Empfindliche neue Methode zur Erkennung von Transistordefekten
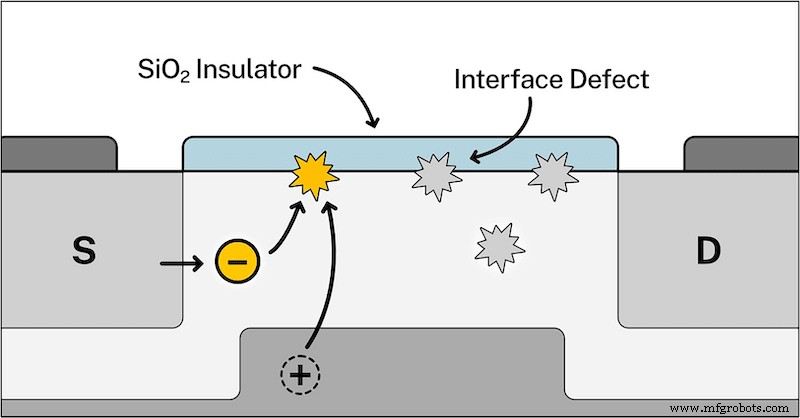
Forscher des National Institute of Standards and Technology (NIST) und Mitarbeiter haben eine hochempfindliche Methode zum Erkennen und Zählen von Defekten in Transistoren entwickelt und getestet – eine Angelegenheit von dringender Bedeutung für die Halbleiterindustrie, die neue Materialien für Geräte der nächsten Generation entwickelt. Diese Defekte schränken die Leistung von Transistoren und Schaltungen ein und können die Produktzuverlässigkeit beeinträchtigen.
Ein typischer Transistor ist für digitale Anwendungen im Grunde ein Schalter. Wenn es eingeschaltet ist, fließt Strom von einer Seite eines Halbleiters zur anderen; Ausschalten stoppt den Strom. Diese Aktionen erzeugen die binären Einsen und Nullen digitaler Informationen.
Die Transistorleistung hängt entscheidend davon ab, wie zuverlässig eine bestimmte Strommenge fließt. Defekte im Transistormaterial, wie zum Beispiel unerwünschte „Störstellen“-Regionen oder gebrochene chemische Bindungen, unterbrechen und destabilisieren den Fluss. Diese Defekte können sich sofort oder über einen längeren Zeitraum während des Betriebs des Geräts bemerkbar machen. Und über viele Jahre hinweg haben Wissenschaftler zahlreiche Möglichkeiten gefunden, diese Effekte zu klassifizieren und zu minimieren.
Aber Defekte sind schwieriger zu identifizieren, da die Transistorabmessungen fast unvorstellbar klein und die Schaltgeschwindigkeiten sehr hoch werden. Für einige vielversprechende Halbleitermaterialien in der Entwicklung – wie Siliziumkarbid (SiC) anstelle von Silizium (Si) allein für neuartige Hochenergie- und Hochtemperaturgeräte – gab es keine einfache und unkomplizierte Möglichkeit, Defekte im Detail zu charakterisieren.
„Die von uns entwickelte Methode funktioniert sowohl mit traditionellem Si als auch mit SiC und ermöglicht uns zum ersten Mal, nicht nur die Art des Defekts, sondern auch die Anzahl von Defekten in einem bestimmten Raum mit einer einfachen DC-Messung zu identifizieren“, sagte James Ashton von NIST, der die Messung durchführte die Forschung mit Kollegen am NIST und der Pennsylvania State University. Die Forschung konzentriert sich auf die Wechselwirkungen zwischen den beiden Arten von elektrischen Ladungsträgern in einem Transistor:negativ geladene Elektronen und positiv geladene „Löcher“, die Räume sind, in denen ein Elektron in der lokalen Atomstruktur fehlt.
Wenn ein Transistor korrekt funktioniert, fließt ein bestimmter Elektronenstrom entlang des gewünschten Pfads. Wenn der Strom auf einen Defekt trifft, werden Elektronen eingefangen oder verdrängt und können sich dann mit Löchern verbinden, um in einem als Rekombination bekannten Prozess einen elektrisch neutralen Bereich zu bilden.
Jede Rekombination entfernt ein Elektron aus dem Strom. Mehrere Defekte verursachen Stromverluste, die zu Fehlfunktionen führen. Ziel ist es, festzustellen, wo sich die Fehler befinden, welche Auswirkungen sie haben und – idealerweise – wie viele sie sind.
„Wir wollten Herstellern eine Möglichkeit bieten, Fehler zu identifizieren und zu quantifizieren, während sie verschiedene neue Materialien testen“, sagte NIST-Co-Autor Jason Ryan. „Wir haben das getan, indem wir ein physikalisches Modell einer Fehlererkennungstechnik erstellt haben, die weit verbreitet, aber bisher kaum verstanden wurde. Anschließend führten wir Proof-of-Principle-Experimente durch, die unser Modell bestätigten.“
Bei einem klassischen Metalloxid-Halbleiter (MOS)-Design wird eine Metallelektrode, das Gate genannt, auf einer dünnen isolierenden Siliziumdioxidschicht platziert. Unterhalb dieser Grenzfläche befindet sich der Hauptkörper des Halbleiters. Auf einer Seite des Gates befindet sich ein Eingangsanschluss, der Source genannt wird; auf der anderen Seite ist ein Ausgang (Drain). Wissenschaftler untersuchen die Dynamik des Stromflusses, indem sie die an Gate, Source und Drain angelegten Vorspannungen ändern, die alle beeinflussen, wie sich der Strom bewegt.
In dieser neuen Arbeit konzentrierten sich die Forscher auf einen bestimmten Bereich, der typischerweise nur etwa 1 Milliardstel Meter dick und einen Millionstel Meter lang ist:die Grenze oder den Kanal zwischen der dünnen Oxidschicht und dem massiven Halbleiterkörper. P>
„Diese Schicht ist enorm wichtig, weil die Wirkung einer Spannung auf das Metall über dem Oxid des Transistors wirkt, um zu ändern, wie viele Elektronen sich innerhalb des Kanalbereichs unter dem Oxid befinden; Dieser Bereich steuert den Widerstand des Bauteils von Source bis Drain“, sagte Ashton. „Die Leistung dieser Schicht hängt davon ab, wie viele Defekte vorhanden sind. Die von uns untersuchte Detektionsmethode konnte bisher nicht feststellen, wie viele Defekte sich innerhalb dieser Schicht befanden.“
Eine empfindliche Methode zur Erkennung von Defekten im Kanal wird als elektrisch detektierte Magnetresonanz (EDMR) bezeichnet, die im Prinzip der medizinischen MRT ähnelt. Teilchen wie Protonen und Elektronen haben eine Quanteneigenschaft namens Spin, die sie wie winzige Stabmagnete mit zwei entgegengesetzten Magnetpolen wirken lässt.
Beim EDMR wird der Transistor mit Mikrowellen bestrahlt. Ein Magnetfeld wird an das Gerät angelegt und seine Stärke wird allmählich variiert, während der Ausgangsstrom gemessen wird. Bei genau der richtigen Kombination aus Frequenz und Feldstärke „kippen“ Elektronen an Defekten – kehren ihre Pole um. Dies führt dazu, dass einige genug Energie verlieren, um mit Löchern an Defekten im Kanal zu rekombinieren, wodurch der Strom verringert wird. Die Kanalaktivität kann jedoch aufgrund des großen Rauschens von der Rekombination im Volumen des Halbleiters schwer zu messen sein.
Um sich ausschließlich auf die Aktivität im Kanal zu konzentrieren, verwenden die Forscher eine Technik namens Bipolar Amplification Effect (BAE), die erreicht wird, indem die an Source, Gate und Drain angelegten Vorspannungen in einer bestimmten Konfiguration angeordnet werden, um Störungen durch andere Dinge zu eliminieren was im Transistor vor sich geht.
BAE wurde ausschließlich als Ressource zum Anlegen von Spannungen und Steuern von Strömen für EDMR-Messungen verwendet, was für eine qualitativere Defektidentifizierung nützlich ist. Das neue Modell ermöglicht BAE als Werkzeug, um die Anzahl der Defekte quantitativ zu messen, und zwar nur mit Strömen und Spannungen. Der wichtige Parameter ist die Grenzflächendefektdichte, die eine Zahl ist, die beschreibt, wie viele Defekte sich innerhalb eines Bereichs der Halbleiter-Oxid-Grenzfläche befinden. Das BAE-Modell gibt Forschern eine mathematische Beschreibung, wie der BAE-Strom mit der Defektdichte zusammenhängt.
Das Modell, das die Forscher in einer Reihe von Proof-of-Concept-Experimenten an Metalloxid-Halbleitertransistoren getestet haben, ermöglicht quantitative Messungen. „Jetzt können wir die Variation der Ladungsträgerverteilung in der gesamten Kanalregion berücksichtigen“, sagte Ashton. „Das eröffnet die Möglichkeiten dessen, was mit einer einfachen elektrischen Messung gemessen werden kann.“
„Diese Technik kann einzigartige Einblicke in das Vorhandensein dieser destabilisierenden Transistordefekte und einen Weg zum mechanistischen Verständnis ihrer Entstehung liefern“, sagte Markus Kuhn, früher bei Intel und jetzt Senior Director of Semiconductor Metrology und Fellow bei Rigaku, der nicht daran beteiligt war die Forschung. „Mit diesem Wissen gäbe es größere Möglichkeiten, sie zu kontrollieren und zu reduzieren, um die Leistung und Zuverlässigkeit von Transistoren zu verbessern. Dies wäre eine Gelegenheit, das Design der Chipschaltkreise und die Geräteleistung weiter zu verbessern, was zu leistungsfähigeren Produkten führt.“
Sensor
- Stromteiler
- Infineon:Neuer Stromsensor für industrielle Anwendungen deckt Bereich von ±25 A bis ±120 A ab
- Eine revolutionäre neue Methode zur Herstellung von Metallteilen
- Eine neue Methode zur gleichzeitigen Detektion von Magnetfeldern in verschiedenen Richtungen
- Empfindliche Methode zur Erkennung von Transistordefekten
- Wirbelstrom-Wegsensoren für die Industrie
- Neuer Sensor ebnet den Weg für kostengünstige empfindliche Methanmessungen
- Neues Transistordesign tarnt wichtige Computerchip-Hardware zum Schutz vor Hackern
- Empfindliche optische Empfänger für den Weltraum
- Nur Luft kaufen – Eine neue Möglichkeit, Druckluft zu kaufen



