Hochspannungs-β-Ga2O3-Schottky-Diode mit Argon-implantiertem Kantenabschluss
Zusammenfassung
Das kantenterminierte Au/Ni/β-Ga2 O3 Schottky-Dioden wurden unter Verwendung von Argonimplantation hergestellt, um die hochohmigen Schichten an der Peripherie der Anodenkontakte zu bilden. Mit einer Implantationsenergie von 50 keV und einer Dosis von 5 × 10 14 cm −2 und 1 × 10 16 cm −2 , die Sperrspannung steigt von 209 auf 252 und 451 V (das Maximum auf bis zu 550 V) und die Baliga-Gütezahl (VBR 2 /Rein ) steigt ebenfalls von 25,7 auf 30,2 und 61,6 MW cm −2 , etwa 17,5% bzw. 140% Verbesserung. Gemäß der 2D-Simulation werden die elektrischen Felder an der Übergangsecke nach der Argonimplantation geglättet und die Position des maximalen elektrischen Durchschlagsfelds, 5,05 MV/cm, ändert sich von der Anodenecke an der Grenzfläche zur Überlappungsecke direkt unter der Implantation Region. Die Temperaturabhängigkeit der Vorwärtscharakteristik wurde ebenfalls untersucht.
Hintergrund
Entwicklung von Hochleistungsbauelementen unter Verwendung von Halbleitermaterialien mit ultrabreiter Bandlücke wie Ga2 O3 , AlN, Diamant usw. beschleunigt sich in den letzten Jahren. Die Bandlücke von β-Ga2 O3 ist so groß wie 4,8–4,9 eV und das Durchbruchsfeld von β-Ga2 O3 wird auf 8 MV/cm geschätzt, etwa dreimal größer als bei 4H-SiC und GaN. Die Gütezahl des Baliga, 3400, ist mindestens zehnmal höher als die von 4H-SiC und viermal höher als die von GaN [1]. Darüber hinaus sind der große Einkristall und das kostengünstige β-Ga2 O3 Substrat kann mit Schmelzwachstumsmethoden wie Floating-Zone (FZ) [2] und Edge-Defined Film-Fed-Wachstum (EFG) [3, 4] hergestellt werden. Die Elektronendichte kann über einen weiten Bereich von 10 16 . gesteuert werden bis 10 19 cm −3 durch Dotieren mit Sn, Si oder Ge [5,6,7]. Diese hervorragenden Eigenschaften machen β-Ga2 O3 ideal für verlustarme Hochspannungs-Schalt- und Hochleistungsanwendungen, einschließlich Schottky-Diode mit hoher Durchbruchspannung (SBD) und Metall-Oxid-Halbleiter-Feldeffekttransistor (MOSFET) [8,9,10,11,12] . Schottky-Dioden besitzen im Vergleich zu p-n-Übergangsdioden die Vorteile einer schnellen Schaltgeschwindigkeit und eines geringen Durchlassspannungsabfalls, wodurch der Leistungsverlust verringert und die Effizienz von Netzteilen verbessert werden kann.
Obwohl in β-Ga2 . große Durchbruchspannungen von 1016 V, 2300 V und 1600 V erreicht wurden, O3 Schottky-Dioden ohne Randabschluss, sie alle haben etwa 34 %, 8 % und 10 % des Idealwertes [10, 13, 14]. Um den Verdrängungseffekt des elektrischen Felds zu verringern und das Spannungspotential von β-Ga2 . vollständig zu realisieren O3 , sind geeignete Randabschlüsse zu konzipieren. Es gibt eine Reihe von Kantenabschlusstechniken, um die Durchbruchspannung des Bauelements zu erhöhen, wie z. B. Feldplatten, schwebende Metallringe, Trench-MOS-Struktur, implantierte Schutzringe und Junction Termination Extension (JTE) [12, 15, 16, 17]. Allerdings sind implantierte Schutzringe und JTE-Strukturen nicht auf Ga2 . anwendbar O3 Schottky-Diode aufgrund der fehlenden p-Dotierung. H. Matsunami und BJ Baliga schlagen eine Randabschlussstruktur vor, bei der Argonimplantation verwendet wird, um eine hochohmige amorphe Schicht an den Rändern der Anode zu bilden, um die elektrische Feldverdrängung zu reduzieren [18,19,20,21,22], die eine einfache Technik, bei der keine Multiphotolithographie oder Tiefgrabenätzschritte erforderlich sind, und sie wird häufig in SiC- und GaN-Gleichrichtern verwendet, um die elektrische Feldverteilung um die gleichrichtende Kontaktperipherie zu glätten [15, 23, 24].
In diesem Papier wird das vertikal kantenterminierte β-Ga2 O3 Schottky-Dioden wurden mit Argon-Implantation an den Kanten der Schottky-Kontakte hergestellt. Die Kapazität-Spannungs-(C-V)- und temperaturabhängigen Stromdichte-Spannungs-(J-V)-Eigenschaften wurden mit dem Keithley 4200 Halbleiter-Charakterisierungssystem aufgezeichnet und die Verteilung des elektrischen Felds wurde ebenfalls analysiert.
Methoden/Experimental
Die Driftschicht mit einer Dicke von 10 μm wurde aus hochwertigem Sn-dotiertem (100)-orientiertem β-Ga2 . erhalten O3 Bulk-Substrat durch mechanisches Peeling. Das β-Ga2 O3 Bulk wurde durch EFG-Technik mit 4 N reinem Ga2 . gezüchtet O3 Pulver als Ausgangsmaterial. Die ausgezeichnete Kristallqualität und die glatte Oberfläche wurden durch hochauflösende Röntgenbeugungs- (HRXRD) und Rasterkraftmikroskop-(AFM)-Messungen bestätigt, wie in Abb. 1a, b dargestellt. Die Halbwertsbreite (FWHM) und der quadratische Mittelwert (RMS) wurden auf 37,4 Bogensekunden bzw. 0,203 nm geschätzt. Abbildung 1c zeigt die Verteilung von β-Ga2 O3 Substratschichtwiderstand mit einer Dicke von 10 μm durch eine Vierpunkt-Sondenmessung. Unter Verwendung einer Trägerkonzentration von (1.3 ± 0.04) × 10 17 cm −3 und einem Schichtwiderstand von (563 ± 18,5)Ω/□ wird die Elektronenmobilität zu 85,3~95,2 cm 2 . berechnet /Vs um μn = 1/(RBlatt × n × q × t ), wobei μn, RTabelle, n , q , und t sind die Elektronenmobilität, der Schichtwiderstand, die Elektronenkonzentration, die Elektronenladung und die Dicke von β-Ga2 O3 Substrat, ähnlich den berichteten Ergebnissen [25]. Argonionenimplantation mit einer Energie von 50 keV, einer Dosis von 2,5 × 10 14 cm −2 , und Hochtemperaturglühen bei 950 °C für 60 Minuten in N2 Atmosphäre wurden zuerst auf der Rückseite durchgeführt, gefolgt von einer Elektronenstrahlverdampfung eines ohmschen Metallstapels aus Ti/Au (20 nm/100 nm) und einem schnellen thermischen Glühen bei 600 °C für 60 s in N2 Umgebungs. Anschließend wurde der 2 µm dicke Fotolack als Maske für die Argonimplantation bei Raumtemperatur mit einer Energie von 50 keV und einer Dosis von 5 × 10 14 . verwendet cm −2 (Beispiel B) und 1 × 10 16 cm −2 (Probe C). Um den Implantationsschaden zu reparieren und den Leckstrom unter Sperrspannung zu reduzieren, wurden die implantierten Proben bei 400 °C für 60 s unter N2 . einem schnellen thermischen Tempern unterzogen Umgebung [13, 26]. Schließlich wurden die kreisförmigen Schottky-Anodenelektroden mit einem Durchmesser von 100 μm auf der Vorderseite durch standardmäßige photolithografische Strukturierung, Aufdampfen eines Ni/Au-Stapels (30 nm/200 nm) und Abheben hergestellt. Das Referenzgerät ohne Argonimplantation wurde ebenfalls hergestellt (Probe A). Abbildung 2a zeigt ein Querschnitts-TEM von hergestelltem Ga2 O3 Schottky-Diode mit argonimplantiertem Kantenabschluss. Ein fast oberflächenamorphes β-Ga2 O3 Schicht wurde im Implantationsbereich erzeugt. Das eigentliche Foto des terminierten β-Ga2 O3 Die Schottky-Diode ist in Abb. 2b gezeigt. Abbildung 2c zeigt den Messaufbau der Durchlassstrom-Spannung (I -V ) Eigenschaften des β-Ga2 O3 SBD, während die Messspannung zwischen 0 und 3 V liegt und der Schritt 10 mV beträgt. Abbildung 2d zeigt den Messaufbau der Sperrstrom-Spannung (I -V ) Eigenschaften von β-Ga2 O3 Schottky-Gleichrichter, um die Durchbruchspannung zu erhalten, während die Messspannung zwischen 0 und – 500 V liegt und die Stufe –1 V beträgt.

a XRD-Rocking-Kurve und b AFM-Bild des β-Ga2 O3 Driftschicht mechanisch abgeblättert von (100) β-Ga2 O3 Substrat c gemessener Schichtwiderstand von 10 mm × 10 mm β-Ga2 O3 Substrat
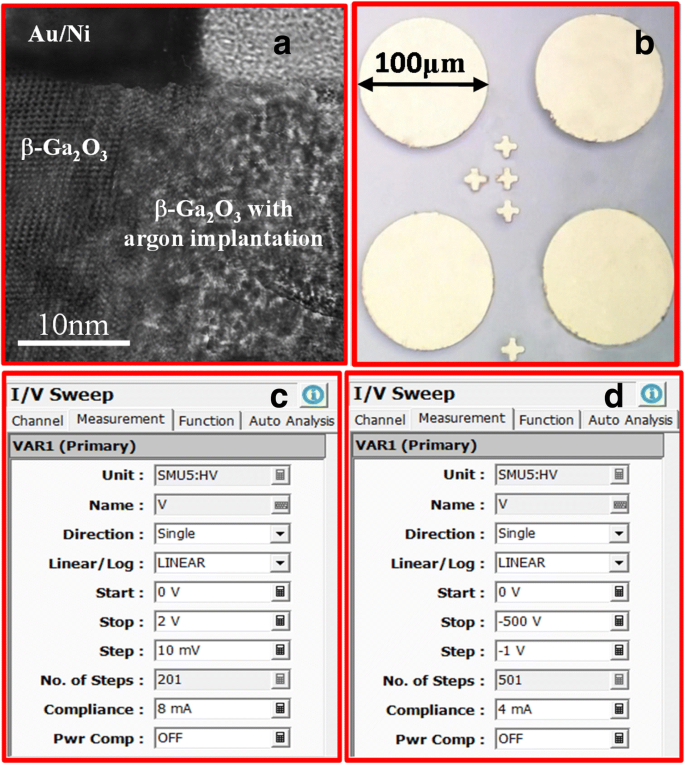
a TEM-Bild von Probe C und b Foto des terminierten β-Ga2 O3 Schottky-Diode c den Messaufbau von Vorwärtsstrom und d Sperrstrom-Spannungs-(I-V)-Eigenschaften des β-Ga2 O3 SBD, um die Durchbruchspannung zu erhalten
Ergebnisse und Diskussion
Abbildung 3 zeigt das experimentelle 1/C 2 gegen V Eigenschaften von drei SBD-Proben bei Raumtemperatur. Die effektive Trägerkonzentration N d -N a von β-Ga2 O3 Driftschicht und eingebautes Potential (eV bi ) werden zu (1.3 ± 0.04) × 10 17 . extrahiert cm −3 bzw. (1,30 ± 0,08) eV. Gemäß den folgenden Gleichungen beträgt die Höhe der Schottky-Barriere φ b_Lebenslauf berechnet sich zu (1,32 ± 0,08) eV.
$$ \frac{1}{C^2}=\frac{2}{q\varepsilon {A}^2\left({N}_d-{N}_{\mathrm{a}}\right)} \left({V}_{bi}-V\right) $$ (1) $$ e{\varphi}_b={eV}_{bi}+\left({E}_c-{E}_f\ rechts)-e\Delta \varphi $$ (2) $$ {E}_c-{E}_f=kT\ln \left(\frac{N_c}{N_d-{N}_a}\right) $$ ( 3) $$ e\Delta\varphi ={\left\{\frac{e}{4\pi\varepsilon}{\left[\frac{2{eV}_{bi}\left({N}_d- {N}_a\right)}{\varepsilon}\right]}^{1/2}\right\}}^{1/2} $$ (4)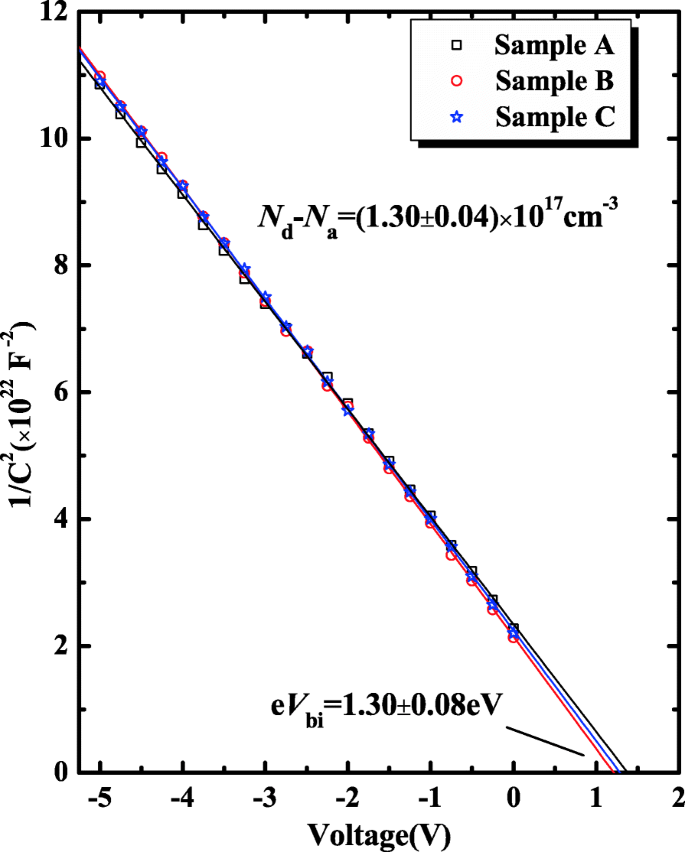
1/C 2 -V Plots von drei β-Ga2 O3 SBD-Beispiele
wo A , q , und ε sind Schottky-Kontaktfläche, Elektronenladung und Permittivität von β-Ga2 O3 . E c , E f , eΔφ , k , T , und N c sind das Leitungsbandminimum, das Fermi-Niveau, die durch die Bildkraft verursachte Absenkung der Potentialbarriere, die Boltzmann-Konstante, die absolute Temperatur in K bzw. die effektive Zustandsdichte des Leitungsbandes.
Abbildung 4a repräsentiert die Durchlassstromdichte-Spannung(J -V ) Eigenschaften des β-Ga2 O3 SBD. Unter der Vorwärtsspannung hat die Argonimplantation keinen signifikanten Einfluss auf die elektrischen Eigenschaften. Die Schwellenspannung beträgt 0,91 V, 0,92 V und 0,95 V für drei Abtastwerte, die I an /Ich aus Verhältnisse sind alle größer als 10 9 bei Raumtemperatur und durch Anpassung des linearen Bereichs die spezifischen Einschaltwiderstände (R an ) sind 1,7,2,1 und 3,3 mΩ cm 2 , und Vorwärtsstromdichten bei 2 V sind 857, 699 und 621 A/cm 2 für jeweils drei Proben, wie in Abb. 4a Einschub gezeigt. Die Stromdichten sind höher und die spezifischen Durchlasswiderstände sind niedriger oder vergleichbar mit den angegebenen Werten für die höhere Leitfähigkeit und Ladungsträgerdichte in der Driftschicht [12, 13, 26, 27, 28, 29, 30].
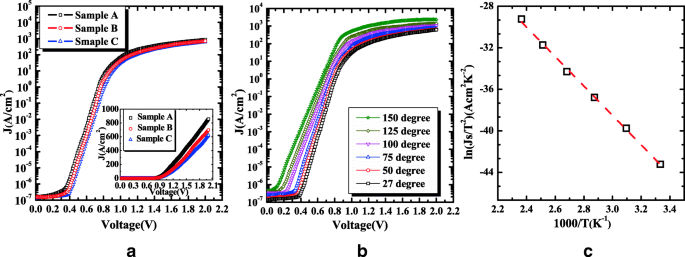
a Der Stürmer J -V Eigenschaften des abgeschlossenen und nicht abgeschlossenen β-Ga2 O3 bei Raumtemperatur und b der temperaturabhängige Vorlauf J -V Eigenschaften von Probe C von 300 bis 423 K. c Richardsons Plot von ln(J s/T 2 ) vs. 1000/T von Probe C
Um die Auswirkungen der Argonimplantation auf die Temperaturabhängigkeit der Vorwärtscharakteristik zu untersuchen, wird der Vorwärts J -V Messungen der Probe C werden von 300 bis 423 K durchgeführt, wie in Abb. 4b gezeigt. Der ideale Faktor n und Schottky-Barrierehöhe φ b_JV werden bei Raumtemperatur mit 1,06 und 1,22 eV bestimmt, niedriger als der φ b_Lebenslauf von (1,32 ± 0,08) eV, gemäß dem Modell der thermionischen Emission (TE) [31, 32]. Mit steigender Temperatur steigt die n von 1,06 auf 1,02 ab und die Barrierenhöhe verringert sich leicht, ist aber über den Temperaturbereich fast konstant bei 1,21 ± 0,01 eV, was im Gegensatz zur Abnahme der Barrierenhöhe einer idealen Schottky-Diode mit Temperaturerhöhung steht, aber bei hergestelltem β-Ga . beobachtet wurde 2 O3 SBD [26]. Mit der Gleichung ln(J s/T 2 ) = ln(A*)-qϕ b /kT , die Schrankenhöhe ϕ b und die effektive Richardson-Konstante A* werden zu 1,22 eV und 48,5 A/cm 2 . bestimmt K 2 für Probe C aus der Steigung und dem y -Achsenabschnitt des linearen Bereichs des Diagramms, wie in Fig. 4c gezeigt. Darüber hinaus liegen die extrahierten A*-Werte für Dutzende von Geräten der drei Stichproben zwischen 24 und 58 A/cm 2 K 2 , im Einklang mit den Ergebnissen des vorherigen Experiments und dem theoretischen Wert, 24–58 A/cm 2 K 2 , mit der effektiven Elektronenmasse m * = 0,23–0,34 m0 von β-Ga2 O3 [33,34,35,36,37].
Abbildung 5a zeigt das umgekehrte J -V Eigenschaften der Proben. Nach der Argonimplantation steigt die Durchbruchspannung von 209 auf 252 und 451 V und die Baliga-Gütezahl (VBR 2 /Rein ) für drei Proben sind ungefähr 25,7, 30,2 und 61,6 MW cm −2 , bzw. Während der Implantation können einige Defekte eingeführt werden und zu einem signifikanten und unerwünschten Anstieg des Leckstroms führen, der auch bei SiC- und GaN-Schottky-Dioden-Bauelementen berichtet wurde [18, 19, 20]. Obwohl das thermische Glühen nach der Argonimplantation durchgeführt wurde, gibt es immer noch etwas größere Leckströme für die Proben B und C. Daher sollten die Untersuchungsdetails der Temperatur und Dauer nach dem Glühen der elektrischen Vorwärts- und Rückwärtscharakteristika in der folgenden Arbeit behandelt werden.

a Umgekehrt J -V Eigenschaften des β-Ga2 O3 Proben bei Raumtemperatur. b und c Verteilung der Durchbruchspannungen von β-Ga2 O3 SBDs mit und ohne Argonimplantation
Abbildung 5b, c zeigt die Verteilung der Durchbruchspannungen von β-Ga2 O3 Schottky-Gleichrichter mit und ohne Argonimplantation. Die idealen planparallelen Durchbruchspannungen dieser Geräte werden mit 553 ~ 598 V bestimmt, wobei das kritische elektrische Feld von 5,1 bis 5,3 MV/cm verwendet wird [11, 39]. Die Durchbruchspannung ohne Argonimplantation beträgt etwa 110 bis 310 V, was etwa 50 % der Idealwerte entspricht. Bei einer Argonimplantationsdosis von 5 × 10 14 cm −2 , erhöht sich die Durchbruchspannung auf 150~350 V, nicht viel größer als beim Referenzgerät, während bei einer Dosis von 1 × 10 16 cm −2 , nähert sich die Durchbruchspannung den Idealwerten. In dieser Arbeit kann die maximale Durchbruchspannung von 550 V erreicht werden. Außerdem wurde die elektrische Feldverteilung bei der Durchbruchspannung simuliert. Zur Vereinfachung wurde ein einzelnes Midgap-Akzeptorniveau mit einer durch die TRIM-Simulation bestimmten Implantationstiefe von 50 nm hinzugefügt und das unvollständige Ionisationsmodell wurde ebenfalls berücksichtigt [38], wie in Abb. 6 gezeigt. Offensichtlich glättet die hochohmige Schicht effektiv das elektrische Feld an den Übergangsecken aus und erhöht die Durchbruchspannung im Vergleich zur Referenzprobe stark. Die maximalen elektrischen Felder bei Durchbruchspannung betragen alle etwa 5,05 MV/cm, ähnlich den berichteten Ergebnissen [11, 39], während sich die Position von der Anodenecke an der Grenzfläche zur Überlappungsecke direkt unter der Implantationsregion ändert, wie in angegeben Abb. 6d, z. B.
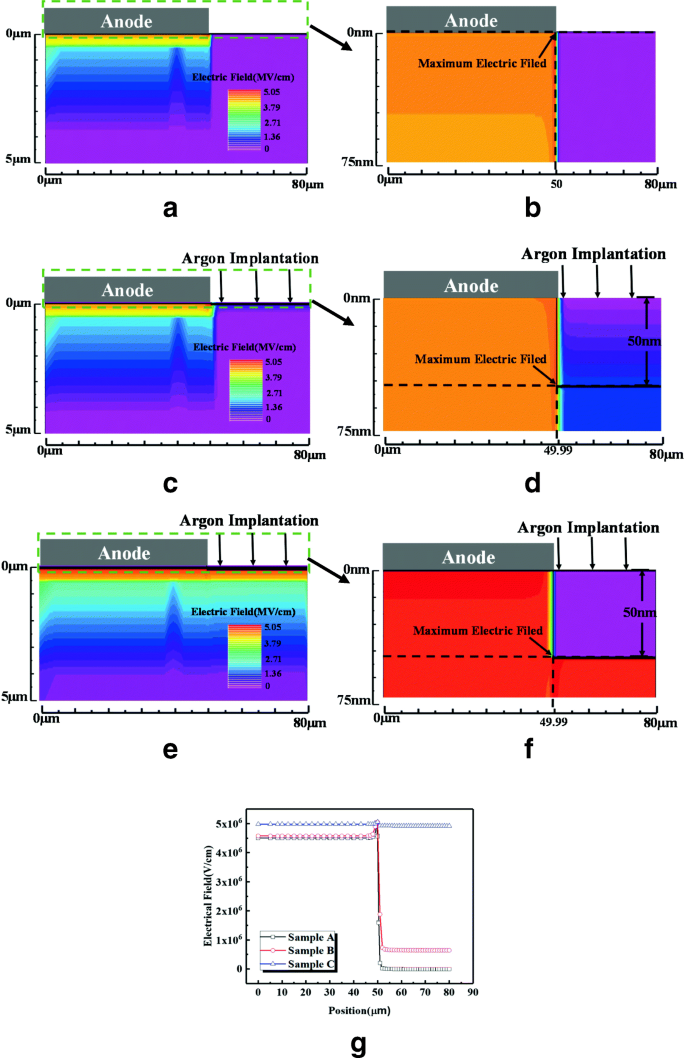
Simulation der elektrischen Feldverteilung bei Durchbruchspannung der Proben A–C (a , c , e ), das vergrößerte Bild ausgewählter Regionen in einem gestrichelten Kasten (b , d , f , g ), das simulierte elektrische Feld im Vergleich zur Position entlang der gestrichelten Linie in (b , d , f ) für drei Proben, Au/Ni/β-Ga2 O3 Grenzfläche für Probe A, 50 nm unterhalb der Grenzfläche für Probe B bzw. C. Das maximale Feld beträgt 5,05 MV/cm
Schlussfolgerungen
Vertikales Au/Ni/β-Ga2 O3 Schottky-Dioden mit durch Argonimplantation gebildetem Randabschluss wurden auf β-Ga2 . hergestellt O3 Driftschicht mechanisch abgeblättert aus hochwertigem (100)-orientiertem β-Ga2 O3 Bulk-Substrat. Im Vergleich zum Steuergerät sind die spezifischen Einschaltwiderstände (R an ) erhöht sich von 1,7 auf 2,1 und 3,3 mΩ cm 2 und die Durchbruchspannung steigt von 209 auf 252 und 451 V bei einer Implantationsdosis von 5 × 10 14 cm −2 und 1 × 10 16 cm −2 , jeweils mit einem größeren Sperrleckstrom. Das maximale elektrische Feld bei der Durchbruchspannung beträgt etwa 5,05 MV/cm, viel größer als das von SiC und GaN.
Abkürzungen
- AFM:
-
Rasterkraftmikroskop
- EFG:
-
Kantendefiniertes Wachstum mit Filmzuführung
- FWHM:
-
Die volle Breite beim halben Maximum
- FZ:
-
Floating-Zone
- HRXRD:
-
Hochauflösende Röntgenbeugung
- JTE:
-
Erweiterung des Anschlussabschlusses
- MOSFET:
-
Metall-Oxid-Halbleiter-Feldeffekttransistor
- RMS:
-
Quadratischer Mittelwert
- SBD:
-
Schottky-Diode
- TE:
-
Thermionische Emission
Nanomaterialien
- ST treibt KI zu Edge- und Node-Embedded-Geräten mit STM32 Neural-Network Developer Toolbox
- ept:HighSpeed SMT-Randkartensteckverbinder mit 0,8 mm Rastermaß
- Elektronik der Zukunft:MEMS-Mikrofon von CUI mit verbesserter Audioqualität
- Advantech bringt mit NVIDIA beschleunigtes Computing von der Cloud zum Edge
- ADLINK:Bereitstellung von KI vom Edge bis zur Cloud mit Edge AI Solutions und der NVIDIA EGX-Plattform
- ADLINK präsentiert eine schnellere und genauere Logistik mit Edge IoT Smart Pallet Experience
- Cisco verbindet Unternehmen und Industrie mit neuen Routern
- Upgrade von Industrie 4.0 mit Edge Analytics
- Entwicklung von Edge Computing, IIC schließt sich OpenFog an
- Intelligente 5G-Patrouillenroboter, die mit Advantechs Edge-Computer ausgestattet sind, werden zur Bekämpfung des Coronavirus eingesetzt



