Ein Überblick über die Ga2O3-Halbleiter-basierte Schottky-Diode mit ultrabreiter Bandlücke für Anwendungen in der Leistungselektronik
Zusammenfassung
Galliumoxid (Ga2 O3 ) ist ein neues Halbleitermaterial, das den Vorteil einer ultrabreiten Bandlücke, eines hohen elektrischen Durchschlagsfelds und einer großen Baliga-Leistungszahl (BFOM) hat und daher ein vielversprechender Kandidat für Hochleistungsbauelemente der nächsten Generation, einschließlich Schottky-Diode (SBD .) ist ). In diesem Artikel werden die grundlegenden physikalischen Eigenschaften von Ga2 O3 Halbleiter analysiert. Und die jüngsten Untersuchungen zum Ga2 O3 -basierte SBD wurden überprüft. Inzwischen wurden verschiedene Verfahren zum Verbessern der Leistungen, einschließlich Durchbruchspannung und Einschaltwiderstand, zusammengefasst und verglichen. Schließlich die Aussicht auf Ga2 O3 -basierte SBD für Leistungselektronikanwendungen wurde analysiert.
Hintergrund
Mit der schnellen Entwicklung der elektrischen Energie-, Industriesteuerungs-, Automobilelektronik- und Unterhaltungselektronikindustrie besteht eine enorme Nachfrage nach Hochleistungs-Leistungshalbleiterbauelementen. Halbleitermaterialien mit großer und ultraweiter Bandlücke können diese Nachfrage befriedigen [1, 2]. Unter den fünf Strukturen von Ga2 O3 Einkristall, monoklin β -Ga2 O3 ist am stabilsten und hat eine ultraweite Bandlücke (E g ~ 4,8 eV) und sehr hohes elektrisches Durchschlagsfeld (E br ~ 8 MV cm −1 ), verglichen mit dem traditionellen Si- und später entwickelten SiC- und GaN-Material. Folglich β -Ga2 O3 zeigt eine viel große Baliga-Leistungszahl (BFOM =\(\varepsilon\mu{E}_{\mathrm{b}}^3\); ε die relative Dielektrizitätskonstante ist und μ ist die Elektronenbeweglichkeit). BFOM ist ein wichtiges Kriterium, um die Eignung eines Materials für die Anwendung in Leistungsgeräten zu beurteilen [3,4,5,6,7,8,9,10,11]. Tabelle 1 vergleicht die grundlegenden physikalischen Eigenschaften von Si, große Bandlücke (GaN, SiC) und ultraweite Bandlücke (β -Ga2 O3 ) Halbleitermaterial. Für das Wachstum von einkristallinen β -Ga2 O3 Substrat gibt es einfache, kostengünstige und massenproduzierbare Schmelzwachstumsmethoden bei Atmosphärendruck, wie Floating Zone (FZ) [12, 13] und das Edge-Defined Film-Feed-Wachstum (EFG) [14,15 ,16,17]. Dies ist eine weitere Überlegenheit von Ga2 O3 im Hinblick auf ein qualitativ hochwertiges Einkristallwachstum im Vergleich zu SiC und GaN. Daher β -Ga2 O3 ist ein vielversprechender Kandidat für Hochleistungs-Halbleiterbauelemente der nächsten Generation wie Schottky-Dioden (SBD) [18,19,20,21,22,23,24] und Metall-Oxid-Halbleiter-Feldeffekttransistoren (MOSFET) [ 25,26,27,28,29]. Es ist erwähnenswert, dass viele Studien zum Ga2 O3 Materialwachstum und Herstellung und Charakterisierung von Leistungsbauelementen wurden in den letzten Jahren durchgeführt, daher haben wir in diesem Artikel die Materialeigenschaften des ultrabreiten Bandabstands Ga2 . untersucht O3 Halbleiter und die Untersuchungen des Ga2 O3 -basierte SBD für Anwendungen in der Leistungselektronik. Bei SBD sind die wichtigsten Leistungsparameter die Durchbruchspannung (V br ) und Einschaltwiderstand (R an ), also durch Zusammenfassung und Vergleich der verschiedenen Methoden zur Verbesserung des V br und R an Wir wünschen uns, dass unsere Überprüfungsarbeit für die Entwicklung von Ga2 . von Vorteil ist O3 -basierte Stromversorgungsgeräte.
Physische Eigenschaften von Galliumoxid-Halbleiter
Galliumoxid (Ga2 O3 ) ist ein neues oxidisches Halbleitermaterial, das jedoch auf eine lange Forschungsgeschichte zurückblickt. Die Untersuchung der Phasengleichgewichte im Al2 O3 -Ga2 O3 -H2 O-System kann bis 1952 zurückverfolgt werden, und R. Roy et al. die Existenz von Polymorphen von Ga2 . festgestellt O3 und ihre Stabilitätsbeziehungen [30]. 1965 haben H. H. Tippins et al. untersuchte die optische Absorption und Photoleitfähigkeit in der Bandkante von β -Ga2 O3 und bestätigte seine Bandlücke mit einem Wert von 4,7 eV [6]. In den 1990er Jahren eine Reihe von Methoden zum Schmelzwachstum von Ga2 O3 Bulk-Einkristall- und Epitaxiewachstum von Ga2 O3 Film entwickelt worden war. In den letzten 5 Jahren wurde Ga2 . aufgrund seiner besonderen Eigenschaften und des erfolgreichen Wachstums hochwertiger und großformatiger einkristalliner Substrate O3 Material hat viel Forschungsinteresse geweckt.
Bisher wurden fünf kristalline Phasen von Ga2 . gefunden O3 , d. h. α , β , γ , δ , und ε Phasen. Die Transformationsbeziehungen zwischen diesen fünf Phasen sind in Abb. 1 dargestellt [30]. Die monokline Phase β- Ga2 O3 hat die beste thermische Stabilität, während die anderen vier Phasen metastabil sind und sich in β- . umwandeln können Ga2 O3 bei hohen Temperaturen. Daher konzentrieren sich die meisten Studien derzeit auf β- Ga2 O3 . Einige neuere Untersuchungen haben auch ergeben, dass andere Phasen einige besondere Materialeigenschaften aufweisen, die β Phase nicht hatte. Zum Beispiel α- Ga2 O3 hat eine Korund-Kristallstruktur ähnlich der von Saphir (Al2 O3 ), daher ist es vergleichsweise einfach, qualitativ hochwertige α- . epitaktisch zu züchten Ga2 O3 Einkristallfilm auf dem aktuell vorhandenen Al2 O3 einkristallines Substrat. Hexagonale Phase ε- Ga2 O3 ist die zweite stabile Phase und weist einen starken spontanen Polarisationseffekt auf, der vorteilhaft ist, um hochdichtes 2D-Elektronengas in der Heteroübergangsgrenzfläche zu bilden [31], ähnlich wie beim AlGaN/GaN-Übergang. In den letzten Jahren hat sich aufgrund des erfolgreichen Wachstums von großformatigen β- Ga2 O3 einkristallines Substrat und seine beste Stabilität bisher die Untersuchungen an β- Ga2 O3 sind weit mehr als die der anderen vier Phasen. In diesem Artikel besprechen wir also hauptsächlich die Forschungsarbeiten zu β- Ga2 O3 .
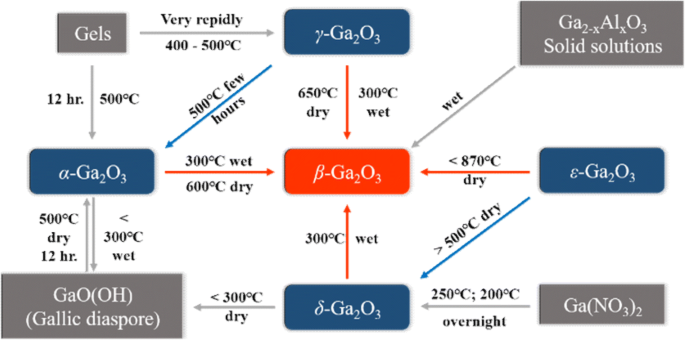
Transformationsbeziehungen zwischen den kristallinen Phasen von Ga2O3 und ihren Hydraten [30]
β- Ga2 O3 gehört zum monoklinen System und ist thermisch stabil. Seine Gitterkonstanten sind a = 1,22 nm, b = 0,30 nm und c = 0.58 nm, wie in Abb. 2 gezeigt. Die kristalline Struktur von β- Ga2 O3 bestimmt, dass es eine gewisse Leitfähigkeit hat, die jedoch durch seine ultraweite Bandlücke (4,7–4,9 eV) begrenzt ist, dem breitesten aller bekannten transparenten Halbleitermaterialien. Nur wenn einige Defektenergieniveaus in der Bandlücke vorhanden sind und freie Elektronen entstehen, weist das Material eine vergleichsweise starke Leitfähigkeit auf. Bei den meisten Halbleitern mit großer Bandlücke wird die Leitfähigkeit nur durch das Vorhandensein von Defektniveaus in der Bandlücke gebildet, wie z. B. bei ZnO-Halbleitern [32]. Die intrinsische elektrische Leitung von β- Ga2 O3 stammt von den freien Elektronen, die von den Punktdefekten in der Kristallmasse geleitet werden. Die meisten Studien haben gezeigt, dass die Sauerstoffleerstellen die Hauptdefekte für die elektrische Leitung sind [33,34,35].

Die Gitterstruktur von β-Ga2 O3 Kristall. Nachdruck aus Ref.-Nr. [5]
Es ist interessant, dass aufgrund der vielen Sauerstoff-Leerstellen in polykristallinen β- Ga2 O3 , ist es leicht, irgendeine Art von Gas zu absorbieren, um den spezifischen Widerstand zu ändern, daher gab es viele Berichte über die Verwendung von β- Ga2 O3 Gassensoren zum Nachweis von H2 . herzustellen , CH4 , CO und O2 [36,37,38,39]. Da die Gitterkonstante von β- Ga2 O3 in [100]-Richtung viel größer ist als in den [001]- und [010]-Richtungen, ist es leicht, ultradünne Filme entlang der [100]-Richtung zur Vorrichtungsherstellung abzulösen [27, 40, 41, 42, 43]. Gleichzeitig wird aufgrund dieser Kristallstruktureigenschaft bei der Herstellung von β- Ga2 O3 Wafern kann durch Schneiden der Masse entlang der [100]-Richtung eine ebene Oberfläche mit sehr geringer Rauheit erreicht werden.
Im Vergleich zu SiC und GaN, β- Ga2 O3 besitzt besondere elektrische Eigenschaften, von denen die ultraweite Bandlücke (4,7–4,9 eV) am bekanntesten ist. Dadurch hat es ein sehr hohes kritisches elektrisches Durchschlagsfeld (E br ≈8 MV/cm), etwa doppelt so hoch wie bei SiC und GaN. Das elektrische Durchschlagsfeld des Materials ist ein sehr wichtiger Parameter für unipolare Leistungsbauelemente. Wenn ein Material ein höheres E hat br , in dem Material der Einheitsdicke kann ein höheres elektrisches Feld aufrechterhalten werden, was für die Verringerung der Gerätegröße und die Verbesserung des Integrationsgrads von Leistungsmodulen vorteilhaft ist. Abbildung 3 zeigt die grundlegenden Grenzen des Einschaltwiderstands (R an ) als Funktion der Durchbruchspannung (V br ) für mehrere wichtige Halbleiter einschließlich Si, GaAs, SiC, GaN, Ga2 O3 , und Raute [5]. Aus dieser Abbildung können wir entnehmen, dass der Leitungsverlust von Ga2 O3 ist eine Größenordnung niedriger als die von SiC- und GaN-Geräten bei gleicher V br . Somit ist Ga2 O3 zeigt sein großes Potenzial in unipolaren Geräten. Da die Sättigungselektronenmobilität von β- Ga2 O3 ist vergleichsweise niedrig (~ 200 cm 2 V − 1 s − 1 ), β- Ga2 O3 ist im Vergleich zu GaN nicht für Hochfrequenzgeräte geeignet. Jedoch kann seine große Bandlücke diesen Nachteil kompensieren, da eine dünnere Driftschicht eine kleinere Verarmungsbreite hat; somit kann die parasitäre Kapazität verringert werden, um die Anforderungen von Hochfrequenzanwendungen zu erfüllen. Außerdem macht die Bandlücke von etwa 4,8 eV Ga2 O3 besitzen ein spezielles Absorptionswellenband (250–280 nm), das sich gerade im Bereich der sonnenblinden ultravioletten (UV) Strahlung befindet, also Ga2 O3 ist ein natürlich gutes Material zur Herstellung von UV-Detektoren [44,45,46,47].
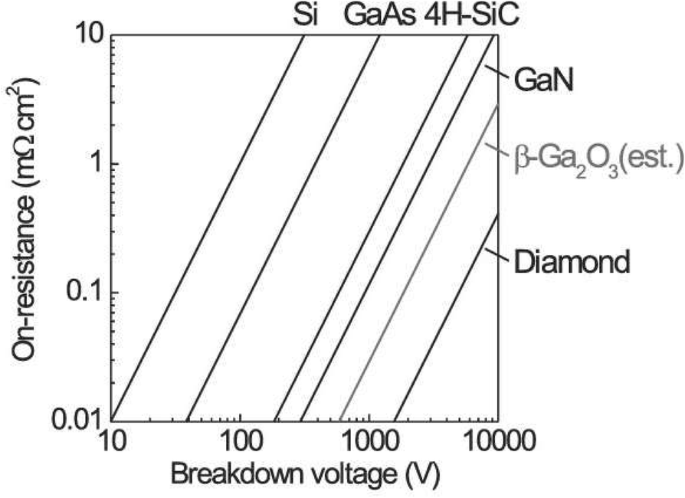
Theoretische Grenzen des Einschaltwiderstands (R an ) als Funktion der Durchbruchspannung (V br ) für β-Ga2 O3 und repräsentative Halbleiter. Nachdruck aus Ref.-Nr. [26]
In den letzten Jahren wurde die n-Dotierung von β- Ga2 O3 wurde grundsätzlich realisiert. Si- und Sn-Elemente haben als Donor-Verunreinigungen mit flachem Energieniveau eine niedrige Aktivierungsenergie. Die Dotierungskonzentration kann gut moduliert werden, um im Bereich von 10 15 . zu liegen –10 19 cm −3 [47], mit dem höchsten Wert von 10 20 cm −3 erreichten. Gleichzeitig ändern sich mit der Änderung der Dotierungskonzentration auch die optischen und elektrischen Eigenschaften. Zum Beispiel der spezifische Widerstand von n-Typ β- Ga2 O3 Änderungen im Bereich von 10 −3 − 10 12 Ω cm mit der sich ändernden Dotierungskonzentration [48, 49]. Die Bandlücke ändert sich auch mit unterschiedlicher Dotierungskonzentration, sodass die Lichtabsorptionseigenschaften von Ga2 O3 beeinflusst werden [50].
Aus der Entwicklung von Ga2 O3 , weist dieses Material noch einige Nachteile auf, wie folgt. (1) P-Dotierung ist eine große Herausforderung von Ga2 O3 Material. Da die Akzeptorniveaus weit vom Valenzband von β- Ga2 O3 , ist die Aktivierungsenergie von Akzeptor-Verunreinigungen sehr hoch. Unterdessen sind die Hintergrundverunreinigungen vom n-Typ in Ga2 O3 Kristall erzeugt auch einen Selbstkompensationseffekt auf Akzeptorverunreinigungen, was zu einer Selbstisolierung des Materials führt. Daher gab es noch immer kein wirksames p-Typ-Verfahren. (2) Die Wärmeleitfähigkeit von Ga2 O3 ist zu niedrig. Experimentelle und theoretische Untersuchungen haben bewiesen, dass die Wärmeleitfähigkeit von β- Ga2 O3 beträgt nur 0,1–0,3 W cm −1 K −1 [51,52,53]. Dies ist nachteilig für das unter Hochspannungs- und Hochstrombedingungen verwendete Leistungsgerät. Ein übermäßiger Wärmestau kann die Leistung und Zuverlässigkeit des Geräts ernsthaft beeinträchtigen. (3) Die Mobilität der Träger ist gering. Die theoretische Mobilität von Ga2 O3 ist auf etwa 200 cm 2 . begrenzt /V s aufgrund des Einflusses der Streuung [54]. Geringe Mobilität wirkt sich negativ auf die Frequenz- und Stromcharakteristik aus.
Das Grundkonzept der Schottky-Diode
Schottky-Kontakt, ohmscher Kontakt und elektrische Feldverteilung sind die Schlüsselfaktoren bei SBD, um hohe Leistungen einschließlich Einschaltwiderstand (R an ) und Durchbruchspannung (V br ), daher sind verschiedene Methoden zu ihrer Verbesserung besonders wichtig.
Nach dem Konzept der Schottky-Barriere hängt die Barrierenhöhe von der Austrittsarbeit des Schottky-Metalls und der Elektronenaffinität des Halbleiters ab. Die Austrittsarbeit verschiedener Metalle ändert sich periodisch, und Metall muss eine größere Austrittsarbeit als Halbleiter haben, um eine Schottky-Barriere zu bilden. Nickel (Ni) und Platin (Pt) sind die üblichen Schottky-Metalle für β- Ga2 O3 , und ihre Barrierehöhen werden mit verschiedenen Methoden abgeleitet [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73,74 ,75,76,77]. Der Verarmungsbereich unter der Oberfläche des Halbleiters benötigt die notwendige Dicke, um das Tunneln von Ladungsträgern zu verhindern, und dies erfordert die begrenzte Dotierungskonzentration des Halbleiters. Übliche Werte der Dotierungskonzentration sind 10 16 –10 17 cm −3 im β- Ga2 O3 Substrat oder Epitaxieschicht [56,57,58,59,60,61,62]. Die Barrierenhöhe wird tatsächlich von den Schnittstellenzuständen beeinflusst und weicht von einer einfachen Beziehung zur Austrittsarbeit ab. Die Oberflächenvorbehandlung zielt darauf ab, die Grenzflächenzustände zu reduzieren, einschließlich der oberflächennahen Sauerstoffleerstellen und freien Bindungen [78].
Der ohmsche Kontakt ist das grundlegende Bindeglied zwischen Metall und Halbleiter. Ein niedriger spezifischer Widerstand des ohmschen Kontakts ist für die Geräte hilfreich, um den Kontaktwiderstand zu verringern (R s ) und Einschaltwiderstand (R an ). Die traditionellen Methoden zum Erreichen eines niedrigen Kontaktwiderstands sind die Wahl eines Metalls mit niedriger Austrittsarbeit und starker Dotierung. Tatsächlich ist die Austrittsarbeit von Kontaktmetall aufgrund des Pinnings von Grenzflächenzuständen für die Bildung von ohmschen Kontakten immer unbeeinflusst. Die starke Dotierung von Halbleitern wird zur primären Technik für den ohmschen Kontakt. Die Hauptziele sind die Verbesserung der Ladungsträgerkonzentration und die Senkung der Grenzflächenbarriere. Das RTA (Rapid Thermal Annealing) verbessert die Grenzflächeneigenschaften und trägt zur Reduzierung des Übergangswiderstandes bei. Y. Yao et al. testete neun Metalle als ohmsche Kontaktmetalle zum β- Ga2 O3 und fanden heraus, dass Titan (Ti) und Indium (In) unter bestimmten Bedingungen ein gutes ohmsches Verhalten zeigen [79]. Nach dem Glühen bei hohen Temperaturen kann nur Titan die kontinuierliche Morphologie beibehalten. Ähnlich wie in den meisten Studien wurde Titan als ohmsches Kontaktmetall mit β- . verwendet Ga2 O3 und erhielten günstige Geräteleistungen [60,61,62,63,64,65,66,67,68,69,70].
Das Durchschlagsverhalten hängt von der Verteilung des elektrischen Felds innerhalb der Vorrichtungen ab, und ein zylindrischer Übergang und ein kugelförmiger Übergang haben unter den gleichen Bedingungen ein größeres elektrisches Feld als ein paralleler Übergang [1]. Daher werden einige Kantenabschlussschutzmethoden benötigt, wie z. B. Feldplatten, um die Durchbruchspannung zu erhöhen [19, 23, 68]. Die Grenzflächenzustände, die als Grenzflächenladungen bezeichnet werden, beeinflussen normalerweise das elektrische Feld nahe der Halbleiteroberfläche und verursachen den vorzeitigen Durchbruch. Der Leckstrom ist ein Indikator für das Durchschlagsverhalten und wird häufig durch interne Defekte von Halbleitern, einschließlich Versetzungen, beeinflusst. Beide Situationen verursachen die Instabilität von Geräten und können die Durchbruchspannung verringern, was vermieden werden sollte. Die gängige Praxis zum Reduzieren des Einflusses von Grenzflächenzuständen ist die Oberflächenpassivierung, und ein hochwertiges Substrat ist auch erforderlich, um die Durchbruchspannung zu erhöhen.
Schottky-Barriere-Diode basierend auf β- Ga2 O3
Die Schwierigkeiten beim Wachstum hochwertiger und kostengünstiger Einkristallsubstrate haben die Kommerzialisierung von SiC- und GaN-Bauelementen beeinträchtigt. Während Ga2 O3 Einkristallsubstrate können durch kostengünstige Schmelzverfahren gezüchtet werden, die Leistungsbauelemente basieren auf Ga2 O3 Einkristalle haben in den letzten Jahren viel Aufmerksamkeit auf sich gezogen. Derzeit ist die n-Dotierungstechnologie von Ga2 O3 ist ziemlich ausgereift, aber das Fehlen einer p-Dotierung macht Ga2 O3 kann nicht in bipolare Geräte angewendet werden. Die ultragroße Bandlücke macht es zu einem großen Vorteil bei der Anwendung unipolarer Geräte. Daher ist die Entwicklung des Ga2 O3 Leistungsbauelemente werden von zwei Arten von unipolaren Bauelementen dominiert, d. h. der Schottky-Diode (SBD) und dem Metall-Oxid-Halbleiter-Feldeffekttransistor (MOSFET) [23, 55, 56].
Mit der Entwicklung der Halbleitermaterialtechnologie mit großer Bandlücke (WBG) beginnt das auf WBG-Halbleitern basierende SBD-Bauelement die p-n-Übergangsdiode für die Anwendung in leistungselektronischen Systemen zu ersetzen, da in SBD kein Minoritätsträgerspeichereffekt existiert und sein Schaltverlust recht gering ist. Theoretisch ist im Vergleich zu SiC und GaN SBD Ga2 O3 SBD kann die gleiche Durchbruchspannung mit einer viel dünneren Driftschicht erreichen. Gleichzeitig führt eine dünnere Driftschicht zu einer geringeren parasitären Kapazität, wodurch die Sperrverzögerungszeit des Geräts verkürzt wird. Die wichtigsten Entwicklungsfortschritte von Ga2 O3 SBD ist in Abb. 4 gezeigt. Mit der Entwicklung der Epitaxietechnologie hat sich die SBD-Struktur von der anfänglichen substratbasierten einfachen Struktur zu der substrat- und epitaktischen filmbasierten komplexen Struktur entwickelt. Anschließend wurden durch die schrittweise Erforschung der Herstellungsverfahren der Bauelemente fortschrittliche Anschlussstrukturen einschließlich Feldplatten und Trenches aufgetaucht, die die Leistungsfähigkeit der Bauelemente weiter verbessern. Ga2 O3 SBD beginnt, sein Potenzial in leistungselektronischen Anwendungen zu präsentieren.
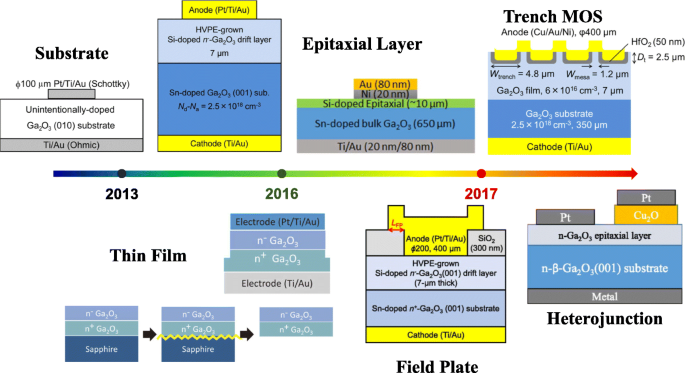
Die Entwicklung von Ga2 O3 SBD in den letzten Jahren [16, 18, 62, 68–71]
Als neues Halbleitermaterial mit großer Bandlücke waren die Menschen in der anfänglichen Entwicklungsphase von Ga2 . mit vielen grundlegenden Problemen konfrontiert O3 , also der Entwicklungsfortschritt von Ga2 O3 SBD reflektiert die Entwicklung der Macht SBD sehr gut. Der wichtigste Teil in SBD ist der Schottky-Übergang, also in den frühen Forschungsarbeiten zu Ga2 O3 SBD, gibt es eine beträchtliche Anzahl von solchen, die sich auf die Untersuchung des Schottky-Übergangs konzentrieren, hauptsächlich einschließlich des Kontakts zwischen Ga2 O3 und verschiedene Schottky-Elektroden (Ni、Cu、Au、Pt、TiN) [57,58,59], der Elektronentransportmechanismus des Schottky-Übergangs, die Probleme der Grenzflächenzustände, der Barriere-Inhomogenität und der Bildkraft im Schottky-Kontakt, und die Methoden zum Erlangen eines perfekten ohmschen Kontakts in der Kathodengrenzfläche [60, 61].
Mit der allmählichen Klarheit der physikalischen Eigenschaften und der zunehmenden Verbesserung der Herstellungsverfahren werden die Geräteleistungen nach und nach verbessert. Im Folgenden sind einige typische Arbeiten bei der Entwicklung von Ga2 . aufgeführt O3 SBD.
Im Jahr 2013 haben K. Sasaki et al. in Tamura Corporation hergestellte SBD basierend auf hochwertigem (010) β –Ga2 O3 Einkristallsubstrat, das durch das Floating-Zone-Verfahren gezüchtet wurde [62]. Sie untersuchten den Einfluss der unterschiedlichen Dotierungskonzentrationen im Substrat auf die Leistungsfähigkeit des Bauelements und stellten fest, dass eine höhere Dotierungskonzentration einen niedrigeren Durchlasswiderstand, aber eine niedrigere Sperrdurchbruchspannung und einen größeren Sperrleckstrom induziert. Abbildung 5 zeigt die umgekehrten Durchschlagseigenschaften der beiden SBDs, die mit (010) β . hergestellt wurden –Ga2 O3 Substrate mit unterschiedlichen Dotierungskonzentrationen. Die Durchbruchspannung erreicht 150 V. Der Idealitätsfaktor beider Bauelemente liegt nahe 1. Und die Schottky-Barrierehöhe des Pt/β –Ga2 O3 Schnittstelle wurde auf 1,3–1,5 eV geschätzt.
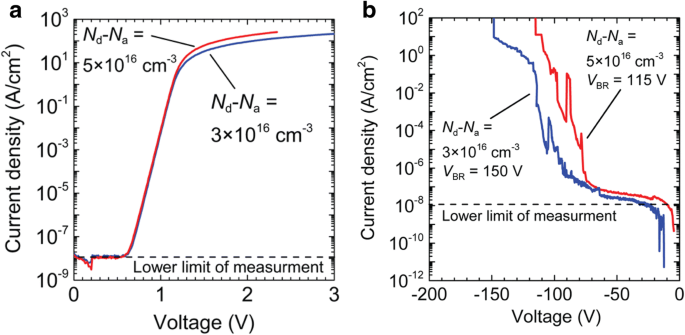
a , b Elektrische Vorwärts- und Rückwärtscharakteristik der SBD basierend auf (010) β -Ga2 O3 Substrate mit unterschiedlichen Dotierungskonzentrationen. Die untere Grenze der Stromdichtemessung beträgt 10 -8 A/cm 2 . Nachdruck aus Ref.-Nr. [62]
Forscher des Institute of Microelectronics of Chinese Academy of Sciences (IMECAS) und der Shandong University haben zusammengearbeitet, um die SBD basierend auf (100)-orientierten β . zu untersuchen –Ga2 O3 Bulk-Substrat. Im Jahr 2017 meldeten sie einen Pt/β –Ga2 O3 SBD und seine temperaturabhängigen elektrischen Eigenschaften. Röntgenbeugung (XRD) und hochauflösende Transmissionselektronenmikroskopie (HRTEM)-Analyse zeigten, dass die β –Ga2 O3 Ein Einkristall, der durch kantendefiniertes Film-gespeistes Wachstum (EFG) gezüchtet wurde, zeigte eine gute (100)-Orientierung und eine gute Kristallqualität (Abb. 6a, b). Durch I-V-Messungen und thermionische Emissionsmodellierung wurde das hergestellte Pt/β –Ga2 O3 Das SBD-Gerät zeigte gute Leistungen, einschließlich eines Gleichrichtungsverhältnisses von 10 10 , Idealitätsfaktor (n ) von 1,1, Schottky-Barrierehöhe (Φ B ) von 1,39 eV, Schwellenspannung (V bi ) von 1,07 V, Einschaltwiderstand (R an ) von 12,5 mΩ cm 2 , Durchlassstromdichte bei 2 V (J @2V ) von 56 A/cm 2 , und effektive Donorkonzentration (N d − N a ) von 2,3 × 10 14 cm −3 (Abb. 6c, d). Auch im Gerät wurde eine gute temperaturabhängige Leistung festgestellt (Abb. 6e, f). Mit steigender Temperatur R an und J @2V besser, was zeigt, dass das Gerät auch bei hohen Temperaturen gut funktionieren kann. In ihrer folgenden Arbeit untersuchten sie die Temperaturabhängigkeit des Idealitätsfaktors und der Schottky-Barrierehöhe weiter und fanden heraus, dass diese Art von Temperaturcharakteristik durch die Gaußsche Verteilung der Barrierehöheninhomogenität erklärt werden kann [61]. 2018 optimierten sie die Kristallwachstumsparameter weiter und verbesserten die Sn-Dotierungskonzentration (N d − N a = 2.3 × 10 14 cm −3 ). Das neue Pt/β –Ga2 O3 SBD-Gerät zeigt deutlich verbesserte Leistung, einschließlich Durchlassstromdichte (J @2V = 421 A/cm 2 ), Widerstand im EIN-Zustand (R an = 2,9 mΩ cm 2 ), eine kurze Sperrerholungszeit (20 ns) und eine Sperrdurchbruchspannung von mehr als 200 V [63]. Ihre Arbeit zeigt, dass mit EFG β –Ga2 O3 Einkristall ist vielversprechend für die Anwendung in Leistungsgeräten.

a Röntgenbeugungskurve (XRD) von (100) β -Ga2 O3 einkristallines Substrat, das deutlich die Peaks der (400), (600) und (800) Ebenen zeigt. b Hochauflösendes Transmissionselektronenmikroskop (HRTEM)-Querschnittsbild von Pt/β -Ga2 O3 Schottky-Kontakt und schnelle Fourier-Transformation (FFT) mikroskopische Aufnahme von β -Ga2 O3 Kristall. c Vorwärts- und Rückwärts-J-V-Kurve eines Pt/β -Ga2 O3 SBD und das Schema des SBD (Einschub). d Vorwärts-J-V-Kurve in linearer und halblogarithmischer Darstellung. e Temperaturabhängige J-V-Kurven und der Richardson-Plot (Einschub). f Abhängigkeit von ON-Widerstand und Durchlassstromdichte von der Temperatur. Nachdruck aus Ref.-Nr. [60]
Q. Feng et al. von der Xidian University haben die Herstellungsverfahren der gepulsten Laserabscheidung (PLD) und die grundlegenden physikalischen Eigenschaften des Al-dotierten β . untersucht –Ga2 O3 Film [64,65,66]. Doping Al ist in der Lage, die Bandlücke von β . abzustimmen –Ga2 O3 durch Einbau unterschiedlicher Al-Atomverhältnisse. Basierend auf einem solchen Al-dotierten Film, Ni/β -(AlGa)2 O3 Die SBD-Vorrichtung wurde hergestellt und charakterisiert. Die Höhe der Schottky-Barriere beträgt 1,33 eV. Das aktuelle Ein-Aus-Verhältnis und der Ein-Widerstand erreichen 10 11 und 2,1 m² cm 2 , bzw. [65]. Sie untersuchten auch den Einfluss der Temperatur auf den Idealitätsfaktor und die Schottky-Barrierehöhe und kamen auch zu dem Schluss, dass diese Temperaturabhängigkeitseigenschaften von n und Φ B wurden den Schottky-Barrieren-Inhomogenitäten zugeschrieben, indem man die Existenz einer Gaußschen Verteilung der Barrierenhöhe annahm [66].
Mit der Entwicklung der Filmepitaxie-Technologie wurde die Halogenid-Dampfphasen-Epitaxie (HVPE) verwendet, um Ga2 . zu züchten O3 Film. Aufgrund der Vorteile der schnellen Epitaxiegeschwindigkeit und der hohen Qualität des Films, HVPE-gewachsenes Ga2 O3 eignet sich sehr gut zur Herstellung der Driftschicht der Hochspannungs-SBD. 2015 haben M. Higashiwaki et al. im National Institute of Information and Communications Technology (NICT) gewachsen 7 μm dick leicht dotiert (~ 1 × 10 16 cm −3 ) Epitaxieschicht auf der stark dotierten (N d − N a = 2,5 × 10 18 cm −3 ) (001) β- Ga2 O3 Substrat durch HVPE-Verfahren und weiter hergestellte SBD-Vorrichtung. Die C–V- und I–V-Eigenschaften des Geräts bei verschiedenen Temperaturen wurden untersucht. Der Änderungstrend der Schottky-Barrierehöhe, Schwellenspannung, C–V- und I–V-Kurven mit der Temperatur wurde aufgezeigt. Abbildung 7 zeigt die Gerätestruktur und die Vorwärts- und Rückwärts-J-V-T-Kurven [16]. Es zeigte sich, dass die Barrierehöhe bei 21–200 °C nahezu konstant blieb. Der Vorwärts- und der Rückwärtsstrom stimmten gut mit dem Modell der thermionischen Emission (TE) bzw. der thermionischen Feldemission (TFE) überein. Ihre Ergebnisse zeigten das Potenzial der Anwendung von Ga2 O3 SBD in Stromversorgungsgeräten der nächsten Generation.
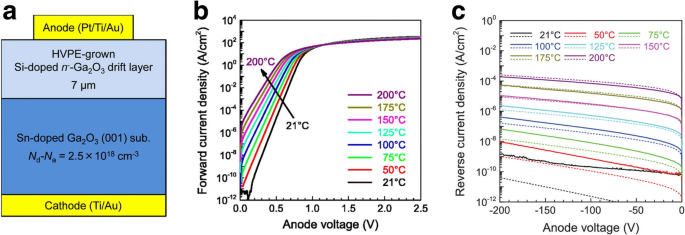
a Aufbau des SBD-Geräts basierend auf dem HVPE-gewachsenen 7-μm-dicken n − - Ga2 O3 homoepitaktische Driftschicht auf n + - Ga2 O3 einkristallines Substrat. b Vorwärts-J-V-Eigenschaften des Geräts, gemessen bei 21–200 °C. c Reverse J–V bei 21–200 °C (durchgezogene und gepunktete Linien stellen die experimentellen bzw. simulierten Ergebnisse dar). Nachdruck aus Ref.-Nr. [16]
Im Jahr 2016 haben M. Oda et al. in FLOSFIA Inc. veröffentlichte eine Arbeit über α -Ga2 O3 SBD [18]. Durch eine chemische Dampfabscheidungstechnik (CVD) mit Nebel, d. h. MIST EPITAXY®, wuchsen sie sukzessive stark (3–4 μm dick) und wurden leicht α . dotiert -Ga2 O3 Filme auf Saphir (Al2 .) O3 ) Substrate. Nach dem Abheben des α -Ga2 O3 Schichten von den Substraten, Kathode und Anode wurden auf der unteren und oberen Oberfläche des n − . abgeschieden - Ga2 O3 /n + - Ga2 O3 Schichten (Abb. 8). Das Gerät mit 2580 nm dickem n − - Ga2 O3 Schicht zeigte eine hohe Durchbruchspannung von 855 V und einen Durchlasswiderstand von 0,4 mΩ cm 2 . Während das Gerät mit einem dünneren (430 nm) n − - Ga2 O3 Schicht-SBDs zeigten einen sehr niedrigen Einschaltwiderstand von 0,1 mΩ cm 2 und einer Durchbruchspannung von 531 V. Im Jahr 2018 berichteten sie weiter über diese Art von Gerät, das mit einem TO220-Gehäuse durchgeführt wurde [67]. Es wurde eine Sperrschichtkapazität von 130 pF erreicht, sodass das Gerät im Vergleich zu SiC SBD und Si SBD eine bessere Sperrrückgewinnungscharakteristik aufwies. Gleichzeitig wies das Gerät nach dem Gehäuse einen Wärmewiderstand von 13,9 °C/W auf, vergleichbar mit dem des SiC SBD mit demselben Gehäuse (12,5°C/W), was zeigt, dass die Verwendung einer dünnen Driftschicht die effektiv kompensieren kann Nachteil der schlechten Wärmeleitfähigkeit von Ga2 O3 Material. In diesem Bericht wiesen die Autoren auch darauf hin, dass α -(Rh,Ga)2 O3 kann als effektive p-Kanal-Schicht von α . wirken -Ga2 O3 Geräte.

Herstellungsverfahren des α -Ga2 O3 SBD vorgeschlagen von FLOSFIA Inc. Nachdruck aus Ref.-Nr. [18, 67]
Im Jahr 2017 haben K. Konishi et al. in NICT berichtete über ein Pt/HVPE-n − - Ga2 O3 /(001)n + - Ga2 O3 SBD-Gerät mit einer Durchbruchspannung von 1076 V und einem Einschaltwiderstand von 5,1 mΩ cm 2 (Abb. 9) [68]. Field Plate (FP) Engineering, eine Art Kantenabschlusstechnologie, wurde erstmals bei Ga2 . verwendet O3 SBD. Durch Hinzufügen eines an der Anode angeschlossenen SiO2 FP wurde das maximale elektrische Feld in der gesamten Gerätestruktur unterhalb des kritischen Feldes gehalten, insbesondere das elektrische Feld um die Anode herum kann offensichtlich verringert werden. Mit diesem Verfahren können sowohl eine hohe Durchbruchspannung als auch ein niedriger Einschaltwiderstand erreicht werden. Im selben Jahr wurde von J. Yang et al. eine höhere Durchbruchspannung (1600 V) berichtet. von der University of Florida in ihrem SBD-Gerät mit einem Ni/MOCVD-n − - Ga2 O3 /(− 201) n + - Ga2 O3 Struktur [69], aber der Einschaltwiderstand ist sehr groß (25 mΩ cm 2 ). Es wurde kein Kantenabschluss verwendet. Ihre Untersuchung zeigte, dass die Größe der Schottky-Elektrode einen Einfluss auf die Durchbruchspannung und den Einschaltwiderstand hatte, da größere Elektroden mehr Defekte aufweisen und zu einem leichteren Durchbruch führen würden.
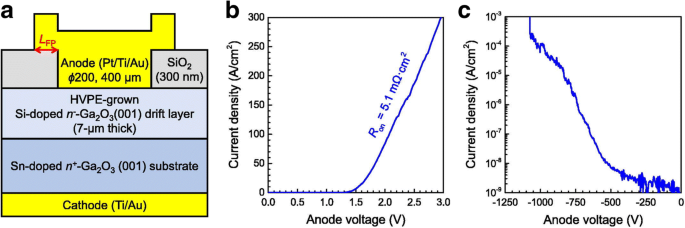
a Aufbau des SBD mit Feldplatte. b , c Elektrische Vorwärts- und Rückwärtscharakteristik (V br = 1076 V). Nachdruck aus Ref.-Nr. [68]
In 2017, K. Sasaki et al. from Novel Crystal Technology Inc. first fabricated β -Ga2 O3 SBD with trench termination structure (Fig. 10) [70]. By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 O3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 O3 SBD exhibited superiority in switching loss.
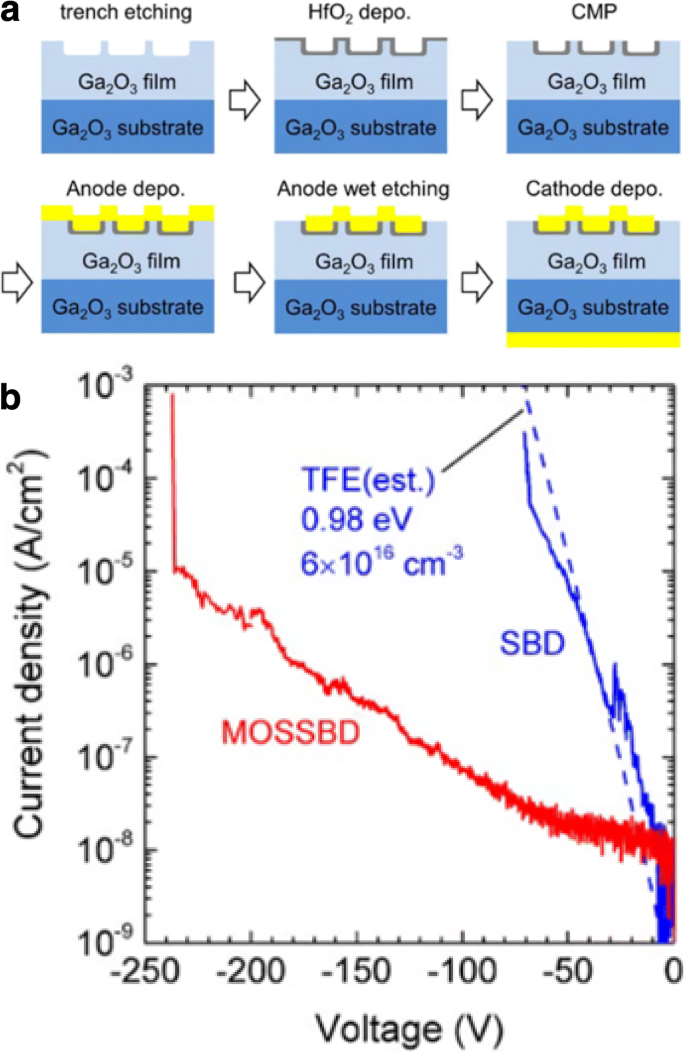
a Fabrication processes of the MOS-type Ga2 O3 SBD with trench termination structure. b Comparison of the reverse characteristics of the Ga2 O3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 O3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 O3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 O3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 O3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 O3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 O3 device before the successful preparation of p-type Ga2 O3 .
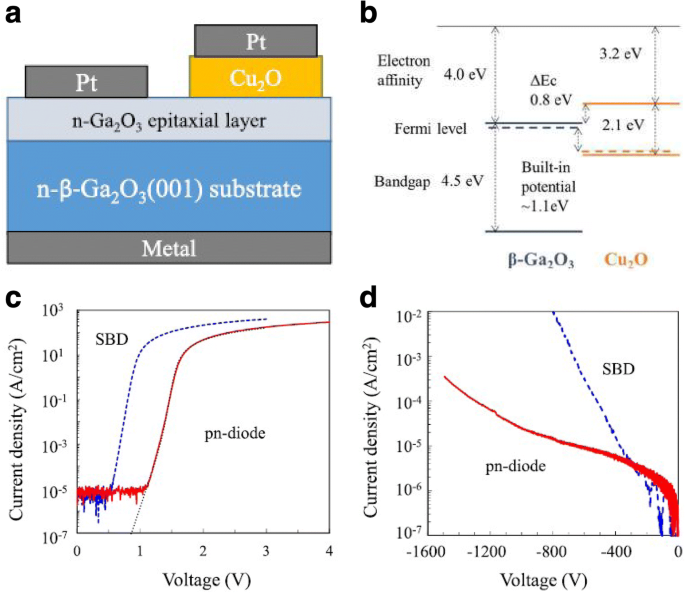
a Schematic of the cross-sectional Pt/Ga2 O3 SBD and p-Cu2 O/n-Ga2 O3 diode. b Band diagram of the p-Cu2 O/n-Ga2 O3 Schnittstelle. c , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 O3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 O3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 O3 SBD single device.

a Rectification circuit. b –e Rectifying effect of Pt/Ga2 O3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 O3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
Schlussfolgerungen
Currently, Ga2 O3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 O3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 O3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 O3 will better display its unique application value, which requires the joint efforts of the researchers.
Abkürzungen
- AC:
-
Alternating current
- BFOM:
-
Baliga’s figure of merit
- Lebenslauf:
-
Chemische Gasphasenabscheidung
- EFG:
-
Edge-defined film-fed growth
- FFT:
-
Schnelle Fourier-Transformation
- FP:
-
Field plat
- FZ:
-
Floating zone
- HRTEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
Metall-organische chemische Gasphasenabscheidung
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD:
-
Gepulste Laserabscheidung
- SBD:
-
Schottky barrier diode
- TE:
-
Thermionic emission
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD:
-
Röntgenbeugung
Nanomaterialien
- Auswahl der Lösungsmittelfarbstoffe bester Qualität für eine perfekte Anwendung
- 10 Faktoren, um den perfekten Schalter für Ihre Anwendung zu finden
- Die Kraft intelligenter Städte für eine bessere Zukunft nutzen
- In der Elektronik will Indien eine "Fabrik für die Welt" werden
- Die Suche nach einem Ersatzgenerator:4 wichtige Fragen
- Die besten Fertigungsoptionen für Elektronikgehäuse
- Ein kurzer Überblick über die Aussichten des Kranmarktes für die kommenden Jahre
- Auswahl des richtigen Stromgenerators für Ihr Unternehmen
- Das richtige Elektrodenmaterial für Ihre Widerstandsschweißanwendung
- So wählen Sie den richtigen Filter für Ihre Anwendung aus



