Maskenbasierte Beugungslithographie in einem Schritt zur Herstellung von schwebenden 3D-Strukturen
Zusammenfassung
Wir schlagen ein neuartiges einstufiges Belichtungsverfahren zur Herstellung dreidimensionaler (3D) schwebender Strukturen vor, das die Beugung von Maskenmustern mit geringer Linienbreite nutzt. Ein optisches Modell des Belichtungsprozesses wird erstellt und die 3D-Lichtintensitätsverteilung im Fotolack basierend auf der Fresnel-Kirchhoff-Beugungsformulierung berechnet. Es wurden mehrere 3D-aufgehängte Photoresiststrukturen erreicht, wie beispielsweise Balken, Maschen, Wortmuster und Mehrschichtstrukturen. Nach der Pyrolyse von SU-8-Strukturen werden weiterhin schwebende und freistehende 3D-Kohlenstoffstrukturen erhalten, die großes Potenzial in der Anwendung transparenter Elektroden, semitransparenter Solarzellen und Energiespeicher aufweisen.
Einführung
3D-Strukturen von mikroelektromechanischen Kohlenstoffsystemen (C-MEMS) haben aufgrund ihrer ausgezeichneten chemischen Stabilität, elektrochemischen Aktivität und Biokompatibilität immer mehr Aufmerksamkeit auf sich gezogen [1,2,3,4,5]. Suspendierte Kohlenstoffstrukturen sind die typischen 3D-C-MEMS-Strukturen frei von jeglicher Intermolekularität [2] und bieten signifikante Vorteile in Sensoren [6, 7], Mikroelektroden [8, 9] und Energiespeicheranwendungen [9]. Durch Pyrolyse von Polymeren wurden verschiedene C-MEMS-Mikrostrukturen erreicht, wobei SU-8 die am häufigsten verwendete Vorstufe für pyrolytische Kohlenstoffstrukturen ist [10, 11]. Aufgrund seiner geringen Lichtabsorption ist es mit SU-8 leicht, Mikrostrukturen mit hohem Aspektverhältnis herzustellen [12]. Es ist jedoch immer noch eine große Herausforderung, suspendierte Polymer-Template zu erhalten.
Es wurden verschiedene Ansätze entwickelt, um schwebende Mikrostrukturen herzustellen, wie z. B. Elektronenstrahlschreiber [13,14,15], Röntgen [10, 16] und Zwei-Photonen-Lithographie [17,18,19]. Die Zwei-Photonen-Lithographie ist ein möglicher Weg, um komplexe schwebende Strukturen, wie etwa schwebende hohle Mikroröhren, mit hoher Genauigkeit, aber geringer Effizienz zu erreichen [17]. Unter Berücksichtigung der Effizienz und der Kosten könnte die UV-Lithographie eine bessere Wahl für die Herstellung von Photoresist-Vorläufern sein. Ein mehrstufiger Lithographieprozess mit kontrollierter Belichtungsdosis zur Herstellung von schwebenden Strukturen wurde demonstriert [3, 6, 7, 20]. Limet al. [21] stellten in einem zweistufigen UV-Lithographieprozess suspendierte Nanodrähte und Nanomaschen her und erhielten durch einen Pyrolyseprozess glasartige Kohlenstoff-Nanostrukturen. Es wurden auch einige einstufige Lithographieverfahren vorgeschlagen. Nein et al. [22] erzielten schwebende Mikrostrukturen durch einen einzigen Belichtungsprozess, bei dem ein optischer Diffusorfilm auf die Cr-Masken aufgebracht wurde. Der Diffusorfilm hatte einen erheblichen Einfluss auf den Belichtungsprozess und führte zur Verformung von Photoresistmustern. Lange et al. [2] stellten erfolgreich 3D-aufgehängte Strukturen her, indem sie die Belichtungsdosis und den Luftspalt zwischen dem Fotolack und der Fotomaske während des Nahbelichtungsprozesses kontrollierten, während der Nahbelichtungsmodus die Herstellungsauflösung begrenzte. Die Graustufenphotolithographie wurde auch bei der Herstellung von schwebenden Strukturen mit Graustufenmasken oder maskenlosen Lithographiesystemen angewendet [11, 23]. Da SU-8 fast transparent ist, wenn die Lichtwellenlänge über 350 nm liegt [12], ist es sehr schwierig, die Genauigkeit der Dicke der suspendierten Schicht durch Einstellen der Belichtungsdosis zu kontrollieren [8, 10]. Hemanthet al. [10] optimierten die UV-Wellenlänge im Belichtungsprozess entsprechend den Eigenschaften von SU-8. Sie wählten die UV-Wellenlänge von 405 nm für die Mikrostrukturen mit hohem Verhältnis und 313 nm für die suspendierte Schicht. Die Kombination der Belichtung mit unterschiedlichen UV-Lichtwellenlängen erhöht jedoch die Kosten und die Schwierigkeiten des gesamten Herstellungsprozesses.
In dieser Studie demonstrieren wir einen neuartigen einstufigen maskenbasierten Beugungslithografieprozess, der mit den meisten Arten von Fotolack kompatibel ist, um 3D-aufgehängte Strukturen herzustellen. Im Fotolack wird eine 3D-Lichtintensitätsverteilung nach der Kirchhoffschen Beugungstheorie simuliert und durch Experimente weiter verifiziert. Die Dicke der abgehängten Strukturen wird durch die Breite der Muster gesteuert, und die abgehängten Balken werden verbreitert, indem mehrere Linienmuster nebeneinander mit geeigneten Abständen gestapelt werden. Durch das einstufige Lithographieverfahren lassen sich komplexe 3D-Hängestrukturen wie Balken mit Gradientendicke und vollhängende Netze mit Wortmustern realisieren. Schließlich wurden auch die hängenden Kohlenstoffträger, -gewebe und freistehenden Kohlenstoffgewebe durch einen Pyrolyseprozess gewonnen.
Methoden und Experimente
Optisches Modell der Beugungslithografie
Während des UV-Lithographieprozesses wird das Beugungsphänomen sehr offensichtlich, wenn die Mustergröße zu klein ist. Hier nutzen wir die Beugung schmaler Muster mit mehreren Wellenlängenbreiten, um schwebende Strahlen herzustellen. Um die räumliche Lichtintensitätsverteilung im Fotolack zu analysieren, bauen wir ein optisches Modell (Abb. 1) für die Beugungslithografie auf Basis der Fresnel-Beugung auf. Der Luftspalt zwischen Fotolack und Fotomaske kann vernachlässigt werden, da die Belichtung im Hartkontaktmodus erfolgt. Die Maske wird mit einer ebenen Welle bei einer typischen Wellenlänge von 365 nm beleuchtet, und der Photoresist wird als transparentes Material mit einem Brechungsindex von 1,659 (dem Brechungsindex von SU-8 bei 365 nm, gemessen mit einem Ellipsometer) behandelt. P 0 ist ein Punkt auf der Maske mit einer Koordinate von (x 0 , y 0 , 0) und P 1 ist ein beliebiger Punkt im Fotolack mit einer Koordinate von (x 1 , y 1 , z 1 ).
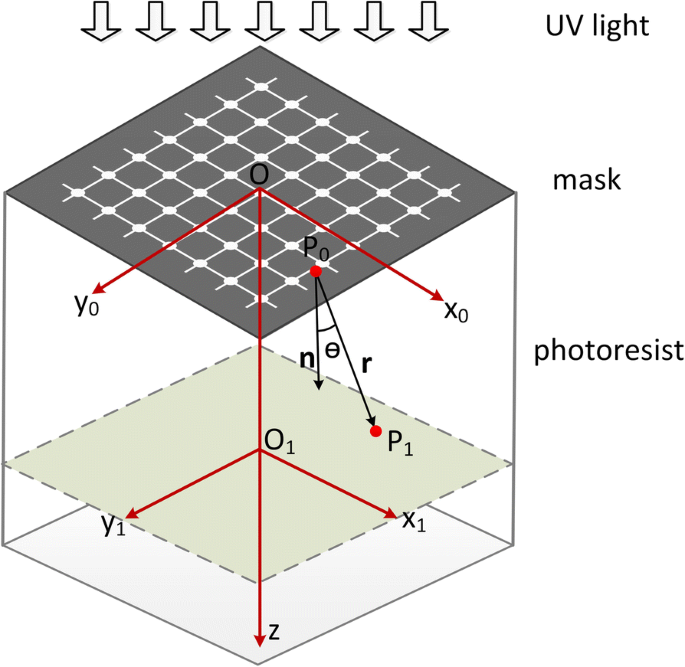
Das optische Modell der Beugungslithographie
Nach der Fresnel-Kirchhoff-Beugungsformulierung [24] ist die Amplitude am Punkt P 1 im Fotolack ist
$$ E\left({P}_1\right)=\frac{1}{2 j\lambda}\underset{\sum }{\iint }E\left({P}_0\right)\frac{\ exp (jkr)}{r}\left(1+\cos\theta\right) ds $$ (1)wo k = 2π /λ , λ stellt die Wellenlänge des UV-Lichts im Fotolack dar, E (P 0 ) ist die Lichtwellenamplitude am Punkt P 0 , θ ist der Winkel zwischen P 0 P 1 und die z Achse, r ist der Abstand zwischen P 1 und P 0 , und Σ repräsentiert den integralen Bereich des Maskenmusters. Gemäß der geometrischen Beziehung in Abb. 1 erhalten wir
$$ r=\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1-{y}_0\right)}^2+{z_1} ^2} $$ (2) $$ \cos \theta ={z}_1/r $$ (3)E (P 0 ) ist eine Konstante im Modell. Somit lautet die Berechnungsformel:
$$ E\left({P}_1\right)=\frac{E\left({P}_0\right)}{2 j\lambda}\underset{\sum }{\iint}\frac{\exp \Big( jk\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1-{y}_0\right)}^2+{z_1} ^2\Groß)}}{\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1-{y}_0\right)}^2 +{z_1}^2}}\left(1+\frac{z_1}{\sqrt{{\left({x}_1-{x}_0\right)}^2+{\left({y}_1 -{y}_0\right)}^2+{z_1}^2}}\right){dx}_0{dy}_0 $$ (4)Dann werden die Integrale mit der Matlab-Software berechnet und die Lichtintensitätsverteilung im Fotolack kann wie folgt ausgedrückt werden:
$$ I\left(x,y,z\right)={\left|E\left({P}_1\right)\right|}^2 $$ (5)wo (x , y , z ) entspricht der Koordinate von P 1 .
Um die Absorption des Fotolacks weiter zu untersuchen, haben wir die Berechnungen der Lichtintensität unter Berücksichtigung des Absorptionskoeffizienten modifiziert. Wenn ein Lichtstrahl den Fotolack von P . passiert 0 zu P 1 , kann die Lichtintensität mit der folgenden Formel berechnet werden [25].
$$ \frac{I_{\alpha}}{I_0}=\exp \left(-\alpha r\right) $$ (6)wo ich 0 ist die anfängliche Lichtintensität am Punkt P 0 , ich α ist die Lichtintensität am Punkt P 1 , α der Absorptionskoeffizient des Fotolacks ist und r ist der Abstand zwischen P 0 und P 1 . Wir definieren ich α = 0 als Lichtintensität am Punkt P 1 wenn α = 0 μm −1 . Es ist leicht zu erhalten, dass I α = 0 = Ich 0 nach Formel (6). Die Beziehungen zwischen E (P α = 0 ) (die Amplitude entspricht I α = 0 ) und E (P α ) (die Amplitude entspricht I α ) kann ausgedrückt werden durch:
$$ \frac{E\left({P}_{\alpha}\right)}{E\left({P}_{\alpha =0}\right)}=\exp \left(-\alpha r /2\rechts) $$ (7)Betrachtet man also die Absorption des Fotolacks in der Beugungslithographie, ist die Amplitude am Punkt P 1 (definiert als E (P 1α )) kann berechnet werden durch:
$$ E\left({P}_{1\alpha}\right)=\frac{1}{2 j\lambda}\underset{\sum }{\iint}\exp \left(-\alpha r/ 2\right)E\left({P}_0\right)\frac{\exp (jkr)}{r}\left(1+\cos\theta\right) ds $$ (8)Und die Lichtintensität kann durch die Formeln (2), (3), (5) und (8) erhalten werden.
Experimentelle Details
Masken mit Linienmustern wurden verwendet, um schwebende Strukturen herzustellen, während Kreise oder Quadrate für die Herstellung von Säulen entworfen wurden, um die schwebende Schicht zu stützen. In den Experimenten wurden zwei Arten von dickem negativen Photoresist verwendet, einschließlich SU-8 2100 (Microchem Co., Ltd.) mit einer Dicke von ~~50 µm und NR26-25000P (Futurrex Co., Ltd.) mit einer Dicke von ~~30 µm. Der Belichtungsprozess wurde mit einem MJB4-Maskenausrichter durchgeführt, bei dem die Wellenlänge des beleuchtenden UV-Lichts 365 nm betrug. Die suspendierten Strukturen können erhalten werden, nachdem die Proben eine gewisse Zeit in den Entwickler eingetaucht wurden. Hier wurde Propylenglykolmethyletheracetat (PGMEA, Aladdin Co., Ltd.) als Entwickler für die SU-8 2100-Proben verwendet und RD6-Entwickler (Futurrex Co., Ltd.) wurde für die NR26-25000P-Proben gewählt. Schließlich wurde ein Pyrolyseprozess [16, 26, 27] mit einem Hartbrennschritt und einem Karbonisierungsbrennschritt in einem Quarzofen (MTI GAL 1400X) durchgeführt, um 3D-Kohlenstoffmikrostrukturen zu erhalten. Der gesamte Prozess ist in Fig. 2a veranschaulicht, und die Temperaturschwankungen während des Pyrolyseprozesses sind in Fig. 2b veranschaulicht. Die Proben wurden 30 min bei 300 °C hartgebacken und dann 60 min bei 900 °C pyrolysiert. Während des Pyrolyseprozesses wurden die Proben im H2 . aufbewahrt (5%)/Ar(95 %) Atmosphäre mit einer Heizrate von 10 °C/min. Die erhaltenen Mikrostrukturen wurden mit einem Rasterelektronenmikroskop (REM, Helios NanoLab G3, FEI) charakterisiert.
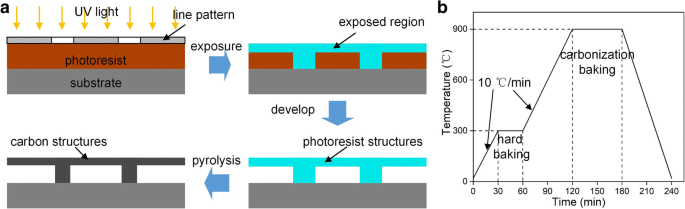
a Der Prozess zur Herstellung von 3D-Carbon-Aufhängungsstrukturen. b Die Temperaturkurve der Pyrolyse
Ergebnisse und Diskussionen
Lichtintensitätsverteilung
Abbildung 3a zeigt den Querschnitt der 3D-Lichtintensitätsverteilung unter einer linienförmigen Maske mit der Linienbreite d = 1 μm, 1,5 μm, 2 μm, 2,5 μm, 3 μm, 3,5 μm bzw. 4 μm. Hier wird die relative Intensität angenommen, und die Intensität des einfallenden Lichts wird als 1 definiert. Das Licht an der Unterseite des Photoresists wird aufgrund des Lichtbeugungseffekts allmählich gestreut. Sobald die Lichtintensität einen Schwellenwert erreicht, erhält der Photoresist genug Energie, um die Reaktion auszulösen und fest zu werden; andernfalls wird es im Entwicklungsprozess entfernt. Die Dicke des Bereichs über dem Schwellenwert (0,75 in dieser Studie) wird als Belichtungstiefe definiert, die sehr empfindlich auf die Musterbreite reagiert. Die Belichtungstiefe beträgt 5,3 μm unter d = 1 μm und 18,2 μm unter d = 2 μm. Sie wird unter d . weiter auf 33,5 μm ansteigen = 3 μm und 47,5 μm unter d = 4 μm. Wenn die Linienbreite schmaler als 1 µm ist, wird die Belichtungstiefe für die Herstellung zu gering, da der Luftspalt zwischen Maske und Fotolack, der durch die Unebenheit des dicken Fotolacks verursacht wird, die Belichtung fehlschlagen lässt. Abbildung 3b, c zeigt die Maskenmuster zur Herstellung von schwebenden Strukturen und die entsprechende Lichtintensitätsverteilung bei z = 5, 10, 15 und 20 μm, wobei die Linienbreite auf 2 μm eingestellt ist. Die Belichtungstiefe der Linien- und Maschenmuster liegt zwischen 15 und 20 µm, während die der großen Quadrate und Kreise groß genug ist, um während der Lithographie Säulen zu bilden. Auf diese Weise können abgehängte Balken und Gitter hergestellt werden, die von den Säulen getragen werden. Da es schwierig ist, abgehängte Strukturen herzustellen, wenn die Linienbreite mehr als 5 µm beträgt, werden Linienmuster nebeneinander gestapelt, um breite abgehängte Balken oder Netze herzustellen, wie in Abb. 3d gezeigt.
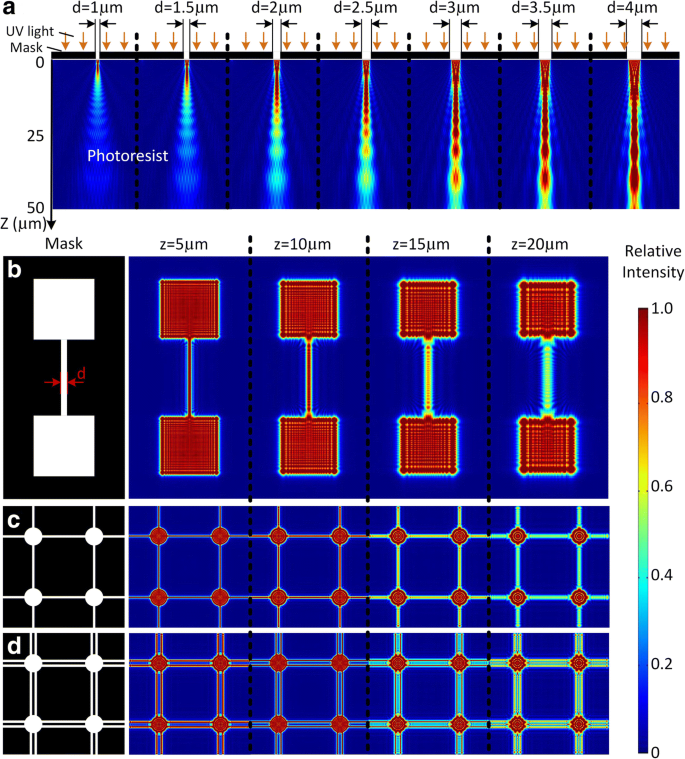
Die Maskenmuster und Simulationsergebnisse im Photoresist. a Die Lichtstärkeverteilungen unterhalb der Fotomaske unter d = 1 μm, 1.5 μm, 2 μm, 2.5 μm, 3 μm, 3.5 μm und 4 μm, wobei d ist die Breite des Linienmusters. Das Maskenmuster für b abgehängte Balken, c Maschen und d Maschen mit gestapelten Linienmustern und den entsprechenden Lichtintensitätsverteilungen unter z = 5 μm, 10 μm, 15 μm und 20 μm im Fotolack. Hier, z ist der Abstand zwischen Schnittebene und Fotomaske
Aufgehängte Fotolackstrukturen
Es wurden Experimente durchgeführt, um schwebende Strukturen herzustellen. Wir haben die Mindestbelichtungszeit getestet, um Fotolacksäulen zu erhalten, und sie als Belichtungsschwelle definiert. Dann wurde das Vier- oder Dreifache des Schwellenwerts als Belichtungsdosis angenommen und der Schwellenwert der relativen Lichtintensität wurde gemäß der Simulation mit 0,75 bewertet. Abbildung 4 zeigt die schwebenden Fotolackstrahlen unter verschiedenen d Wert. Es wird festgestellt, dass die Dicke der suspendierten Schicht h ist positiv verwandt mit d . Für Fotolack NR26-25000P, h ist 10.9 μm unter d = 2 μm (Abb. 4a) und steigt auf 25,5 μm unter d = 4 μm (Abb. 4e). Als d beträgt 5 μm, die Belichtungstiefe ist groß genug, um das Substrat zu erreichen, und es werden keine schwebenden Strukturen erhalten (Abb. 4f). Abbildung 4g–k zeigt die schwebenden Strukturen von SU-8. Die Funktion von h vs. d sowohl für Experimente als auch für Simulationen ist in Abb. 41 dargestellt, wo die Geraden nach der Methode der kleinsten Quadrate angepasst werden. Der lineare Korrelationskoeffizient R der angepassten Linien sind R 2 = 0,963, 0,988 und 0,858 für Simulationen ohne Zählen der Absorption, NR26-25000P bzw. SU-8. Es ist zu erkennen, dass die Ergebnisse der SU-8-Experimente den Simulationsergebnissen sehr nahe kommen. Im Gegensatz dazu ist die Schwebeschicht von NR26-25000P viel dünner als die der Simulation ohne Absorption. Dies ist hauptsächlich auf die transparente Eigenschaft von SU-8 und die hohe Absorptionsfähigkeit von NR26-25000P zurückzuführen. Dies ist auch der Grund, warum Graubelichtung verwendet werden kann, um schwebende Strukturen für einige Fotolacke herzustellen, aber nicht für SU-8 geeignet.
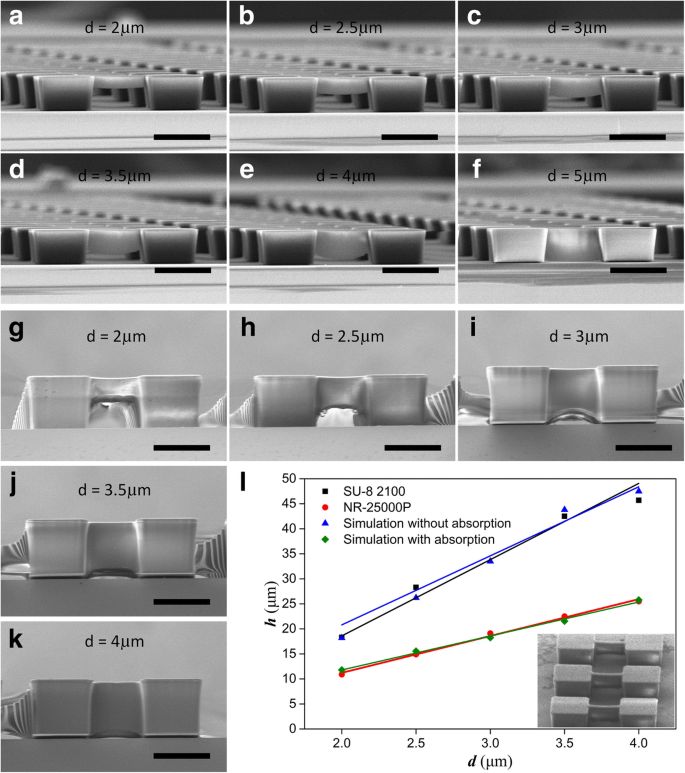
Die suspendierten Photoresiststrahlen entstanden durch einstufige Beugungslithographie mit unterschiedlicher Linienbreite d unter Verwendung des Maskenmusters in Abb. 3b. NR26-25000P Photoresist-Strahlen unter a d = 2 μm, b 2.5 μm, c 3 μm, d 3.5 μm, e 4 μm und f 5 µm; SU-8 2100 Photoresist-Strahlen unter g d = 2 μm, h 2.5 μm, i 3 μm, j 3,5 μm und k 4 μm; l die Funktionen Belichtungsdicke vs. Linienbreite in Simulation ohne Absorption, NR26-25000P und SU-8 2100 und Simulationen mit Absorptionskoeffizient α = 0,0374 μm −1 , wobei der Einschub die Schrägansicht der SU-8-Hängeträger zeigt. Die Dicke der Strahlen nimmt mit der Linienbreite des Maskenmusters zu. Die Maßstabsbalken sind 50 μm
Dann führen wir den Absorptionskoeffizienten α . ein im optischen Modell und führen Sie die Berechnungen mit Formel (8) durch. Die Ergebnisse unter α = 0,0374 μm −1 (der Absorptionskoeffizient von NR21-25000P bei 365 nm, getestet mit einem UV-Vis-Spektrophotometer, UV 2600, Shimadzu Co., Ltd.) sind in Abb. 4l gezeigt, wobei die angepasste Linie mit R 2 = 0,986 stimmt gut mit den experimentellen Ergebnissen von NR26-25000P überein. Somit steht unsere Methode für fast alle Arten von dicken Negativ-Fotolacken zur Verfügung, um schwebende Strukturen mit einstufiger Belichtung herzustellen, bei der die Belichtungstiefe durch Simulationen geführt werden kann.
Abbildung 5a–c zeigt die unterschiedlichen Querverbindungsmuster und die entsprechenden Simulationsergebnisse bei z = 15 μm. Drei Linien werden nebeneinander gestapelt, um einen breiten hängenden Balken herzustellen, wobei die Linienbreite und die Intervallbreite beide 2 μm betragen. Das Kreuzverbindungsmuster mit einem 20-μm-Kreis wird verwendet, um eine Säule herzustellen, um die abgehängten Balken zu tragen (Abb. 5a). Hohle Querverbindungsmuster dienen zur Herstellung von abgehängten Maschen, wie in Abb. 5b, c gezeigt. Die erhaltenen NR26-25000P Fotolackverbindungen sind in Abb. 5d–f dargestellt, wo die Oberflächentexturen auf den Querverbindungen zusammen mit den Balken in guter Übereinstimmung mit den Simulationen (Abb. 5a–c) deutlich zu erkennen sind. Hängematten mit den drei Arten von Querverbindungen sind in Abb. 5g–i dargestellt, auch die Stützpfeiler werden erwartungsgemäß erhalten (Abb. 5g). Abbildung 5h zeigt die dünnen Säulen unter den Querverbindungen aufgrund der dichten Muster mit hohem Verhältnis. Das Kreuzverbindungsmuster in Abb. 5c besitzt ein niedrigeres Tastverhältnis, wenn die Lichtintensität schwach ist, was zu einem vollständig aufgehängten Netz führt (Abb. 5f). Somit kann das Verhältnis der Querverbindungsmuster reduziert werden, um vollständig aufgehängte Strukturen herzustellen, während die Stützpfeiler leicht mit einer festen Verbindung gebildet werden können. In der Zwischenzeit kann die Breite des Strahls auch durch Anpassen der Anzahl der gestapelten Linienmuster gesteuert werden.
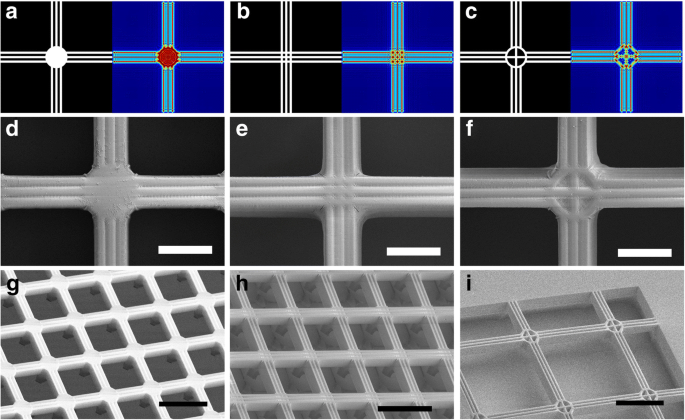
Verschiedene Querverbindungsmuster mit NR26-25000P. a –c Drei Querverbindungsmuster auf der Maske und die entsprechenden Simulationsergebnisse bei z = 15 μm, wobei die Linienbreite 2 μm mit einem Abstand von 2 μm und z . beträgt ist der Abstand zwischen Schnittebene und Fotomaske. d –f Die Texturen auf der erhaltenen Photoresist-Kreuzverbindung und die breiten Balken, bei denen die Maßstabsbalken 20 μm betragen. g Die abgehängten Maschen mit tragenden Säulen. h Die abgehängten Maschen mit dünnen Stützpfeilern, wobei sich die Pfeiler aus den dichten Querverbindungsmustern mit hohem Verhältnis ergeben. ich Die voll aufgehängten Maschenmuster. Die Skalenbalken in g –ich sind 100 μm
Einige komplexe 3D-Mikrostrukturen wurden auch durch eine Einzelbelichtungsmethode (Abb. 6a–c, e, f) oder eine zweistufige Belichtungsmethode (Abb. 6d) hergestellt. Abgehängte Balken mit Gradientendicke sind in Fig. 6a gezeigt, wobei die Breite der Linienmuster in den beiden Bereichen von 2 bis 4 μm und 4 bis 6 μm variiert. Die Dicke der schwebenden Schicht nimmt mit zunehmender Linienbreite zu, entsprechend den in Abb. 4 gezeigten Ergebnissen. Auch aufgehängte konzentrische Ringe und schwebende Wortmuster lassen sich leicht herstellen (Abb. 6b, c). Durch die Kombination der beiden Belichtungsprozesse wurden zwei suspendierte Schichten mit NR26-25000P integriert, wie in Abb. 6d gezeigt. Nachdem die erste Belichtung abgeschlossen ist, wird die zweite Schicht dann auf die erste Schicht aufgeschleudert und belichtet. Die gestapelten Netze werden nach den zwei Belichtungsprozessen gefolgt von einem Entwicklungsprozess erreicht. Da die zweite Belichtung die erste Schicht beschädigen kann, müssen die Strukturen sorgfältig optimiert werden, um ausgezeichnetere mehrschichtige aufgehängte Strukturen herzustellen. Auch SU-8-Photoresist-suspendierte Netze mit Wortmustern wurden erfolgreich hergestellt (Abb. 6d–f), obwohl es aufgrund der hohen Transparenz schwieriger ist als bei NR26-25000P, die Belichtungsparameter zu steuern.
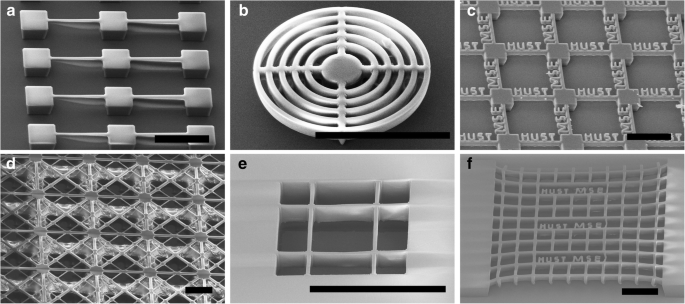
3D suspendierte Photoresiststrukturen. a Abgehängte Balken mit Gefälledicke, b aufgehängte konzentrische Ringe, c unterbrochene Wortstrukturen und d mehrschichtige aufgehängte Netze, bei denen der Fotolack NR26-25000P ist. e Aufgehängtes SU-8-Mesh. f Aufgehängte SU-8-Netze mit Wortmustern. Die Skalenbalken sind 100 µm. Die schwebenden Strukturen in d wird durch eine zweistufige Belichtung erreicht, und die anderen werden mit einer einstufigen Belichtung hergestellt
Im Vergleich zu früheren Arbeiten [2, 11, 22, 23] bilden wir ein 3D-Modell der Lichtintensitätsverteilung im Photolack, indem wir die Beugung der kleinen Maskenmuster nutzen. Die 3D-Hängestrukturen lassen sich durch Simulationen gut kontrollieren und vorhersagen. Dabei wird auch der Absorptionskoeffizient des Fotolacks berücksichtigt. Durch die einstufige Belichtung werden auf einfache Weise abgehängte Strukturen mit unterschiedlichen Dicken, wie beispielsweise Gradientenbalken, gebildet. Darüber hinaus wird der Belichtungsprozess mit einer gewöhnlichen Maske in einem typischen Kontaktbelichtungsmodus durchgeführt, und es werden keine speziellen Masken oder Ausrüstungen benötigt, was eine ausgezeichnete Kompatibilität mit hoher Fertigungsauflösung zeigt.
Pyrolytische Kohlenstoffstrukturen
SU-8 ist ein typischer Vorläufer für die Herstellung von Kohlenstoffmikrostrukturen, während andere Photoresists wie NR26-25000P die Strukturen bei hohen Temperaturen nicht halten können. Abbildung 7a–c zeigt die suspendierten SU-8-Strukturen, während die entsprechenden pyrolytischen Kohlenstoffstrukturen in Abbildung 7d–f dargestellt sind. Während des Pyrolyseprozesses tritt aufgrund der zahlreichen gleichzeitigen Reaktionen, einschließlich Dehydrierung, Cyclisierung, Kondensation, Wasserstoffübertragung und Isomerisierung, eine starke Schrumpfung auf [8, 28]. Somit wird in den pyrolytischen Strukturen, insbesondere in den asymmetrischen Strukturen, eine beträchtliche Restspannung vorhanden sein. Die pyrolytischen Kohlenstoffstrahlen schrumpfen und ziehen die Säulen an beiden Enden, wodurch unten Risse entstehen (Abb. 7d). Bei den großflächigen Netzen hält die Spannung in jeder Richtung ein relatives Gleichgewicht und es werden keine offensichtlichen Risse in den pyrolytischen Kohlenstoffstrukturen gefunden (Abb. 7e, f). Es werden freistehende Carbongewebe mit einer Größe von 12 mm × 20 mm erreicht, wie in Abb. 7g–i gezeigt. Der Schichtwiderstand der Kohlenstoffnetze beträgt etwa 182 Ω/sq, und die Lichtdurchlässigkeit erreicht ~ 67% über die gesamte Wellenlänge. Die so hergestellten Kohlenstoffnetze mit hervorragender Leitfähigkeit und Transparenz können als Elektrode in Perowskit-Solarzellen eingesetzt werden [29,30,31] und bieten eine verfügbare Methode zur Herstellung semitransparenter Solarzellen. Darüber hinaus besitzen die präparierten Kohlenstoffnetze eine hervorragende Flexibilität, die ein großes Potenzial bei der Anwendung flexibler transparenter Elektroden demonstriert.

Aufgehängte SU-8-Netze und pyrolytische Kohlenstoffnetze. a Abgehängte SU-8-Träger. b , c Abgehängte SU-8-Netze mit Stützpfeilern. d Abgehängte Carbonträger, bei denen große Spannungen in den Carbonstrukturen verblieben und Risse am Fuß der Säule auftraten. e , f Abgehängte Carbongewebe. g Freistehendes Carbongewebe nach Pyrolyse. h Vergrößerung des freistehenden Carbongewebes. ich Ein 12 mm × 20 mm freistehendes Carbongewebe, das gute Flexibilität und Transparenz bietet. Die Skalenbalken sind 100 μm
Schlussfolgerungen
Zusammenfassend haben wir die Herstellung von schwebenden Strukturen über ein neuartiges einstufiges maskenbasiertes Beugungslithografieverfahren demonstriert. Die 3D-Lichtintensitätsverteilung im Fotolack wurde simuliert, was zeigt, dass die Belichtungstiefe mit zunehmender Breite der Linienmuster unter d . zunimmt < 5 μm. Dieses Phänomen konnte genutzt werden, um schwebende Strukturen mit definierter Dicke von SU-8-Fotolack herzustellen, der fast transparent war und mit Graustufenlithographie schwer schwebende Strukturen zu bilden war. Auch hier wurden die entsprechenden Versuche durchgeführt. Wir stellten fest, dass die Dicke der hängenden SU-8-Träger den Simulationsergebnissen sehr nahe kam, während die des NR26-25000P viel dünner war als die Expositionstiefe in den Simulationen. Dies wurde durch die hohe Lichtabsorptionseigenschaft von NR26-25000P verursacht. Dann wurde der Absorptionskoeffizient des Photoresists in das optische Modell eingeführt und die Simulationsergebnisse stimmten gut mit den Experimenten überein. Für die Herstellung von abgehängten 3D-Netzen mit oder ohne Stützpfeiler wurden drei verschiedene Kreuzverbindungsmuster entworfen, und die Oberflächentexturen wurden gut reproduziert. Auch Matten mit Stützen und vollhängende Matten wurden erfolgreich realisiert. Andere komplexe 3D-aufgehängte Photoresiststrukturen, einschließlich aufgehängter Strahlen mit Gradientendicke, aufgehängte konzentrische Ringe und aufgehängte Wortstrukturen, wurden durch die einstufige maskenbasierte Beugungslithographie erhalten.
Kohlenstoffhängestrukturen und freistehende Kohlenstoffnetze wurden mit einem typischen zweistufigen Pyrolyseprozess weiter hergestellt. Die suspendierten 3D-Kohlenstoffstrukturen könnten aufgrund ihrer großen Oberfläche in elektrochemischen Elektroden, Superkondensatoren und Sensoren eingesetzt werden. Die freistehenden Netze wiesen eine ausgezeichnete Leitfähigkeit, Flexibilität und hohe Transparenz auf. Daher haben wir eine vereinfachte und vielversprechende Methode zur Herstellung von 3D-Schwebestrukturen und Kohlenstoffnetzen entwickelt, die ein großes Potenzial in den Anwendungen transparenter Elektroden, semitransparenter Solarzellen und Energiespeicher zeigt.
Abkürzungen
- 3D:
-
Dreidimensional
- C-MEMS:
-
Mikroelektromechanische Kohlenstoffsysteme
Nanomaterialien
- SICHT:Für Blinde
- IBM-Wissenschaftler erfinden ein Thermometer für die Nanoskala
- Die Bedeutung von CAD-Modellen für Metallfertigungsprojekte
- Was sind die Vorteile von Edelstahl für Fertigungsprojekte?
- Was sind die Vorteile der Pulverbeschichtung für Metallfertigungsprojekte?
- 5 Tipps zur Auswahl des richtigen Auftragsfertigungsunternehmens
- Die besten Möglichkeiten, Ihre Fertigungswerkstatt auf eine neue Maschine vorzubereiten
- Danke für die Erinnerungen!
- Wie wählt man die geeigneten Platinenmaterialien für die Herstellung flexibler Leiterplatten aus?
- Ein Fokus auf wichtige Designrichtlinien für die einfache Leiterplattenherstellung



