Untersuchung der größenabhängigen Leitfähigkeitseigenschaften einzelner Si-Nanodrähte
Zusammenfassung
Periodisch geordnete Anordnungen von vertikal ausgerichteten Si-Nanodrähten (Si-NWs) werden erfolgreich durch Nanosphären-Lithographie in Kombination mit metallunterstütztem chemischem Ätzen hergestellt. Durch die Anpassung der Ätzzeit können sowohl der Durchmesser als auch die Länge der Nanodrähte gut kontrolliert werden. Die leitfähigen Eigenschaften solcher Si-NWs und insbesondere ihre Größenabhängigkeit werden durch konduktive Rasterkraftmikroskopie (CAFM) an einzelnen Nanodrähten untersucht. Die Ergebnisse zeigen, dass die Leitfähigkeit von Si-NWs von großer Bedeutung für ihren Durchmesser und ihre Länge ist. Si-NWs mit kleineren Durchmessern und kürzeren Längen weisen bessere Leitfähigkeitseigenschaften auf. Zusammen mit der I-V-Kurvencharakterisierung wird ein möglicher Mechanismus unter dem Gesichtspunkt der größenabhängigen Schottky-Barrierehöhe vermutet, der durch elektrostatische Kraftmikroskopie (EFM)-Messungen weiter verifiziert wird. Diese Studie legt auch nahe, dass CAFM ein wirksames Mittel sein kann, um die Größenabhängigkeit (oder andere Parameter) der leitfähigen Eigenschaften einzelner Nanostrukturen zu untersuchen, was sowohl für die Optimierung der Herstellung als auch für potenzielle Anwendungen von Nanostrukturen von wesentlicher Bedeutung sein sollte.
Einführung
Silizium-Nanodrähte (Si-NWs) haben aufgrund ihres hohen Aspektverhältnisses und ihrer einzigartigen elektrischen, thermoelektrischen und photoelektrischen Eigenschaften sowie der Kompatibilität mit der traditionellen Siliziumtechnologie vielversprechende Anwendungen in der Elektronik, Photonik, Optoelektronik und vielen anderen Bereichen gewonnen [1,2,3 ,4,5]. In den letzten Jahrzehnten konzentrierten sich die Forschungen zu Si-NWs hauptsächlich auf Wachstumsverbesserungen und Eigenschaftsmessungen. Zur Herstellung von Si-NWs wurden viele Methoden entwickelt, darunter Bottom-up-Methoden wie die Dampf-Flüssig-Feststoff-Methode, die chemische Gasphasenabscheidung und die Molekularstrahlepitaxie [6,7,8,9,10] und Top-down-Ansätze unter Verwendung von Elektron -Strahllithographie, reaktives Ionenätzen oder metallunterstütztes chemisches Ätzen [11,12,13,14,15,16]. Unter diesen Methoden wurde die Nanosphärenlithographie (NSL) in Kombination mit metallunterstütztem chemischem Ätzen (MACE) aufgrund ihrer Einfachheit, geringen Kosten und Vielseitigkeit intensiv zur Herstellung großflächiger geordneter Arrays von vertikal ausgerichteten Si-NWs eingesetzt [15,16,17 ,18,19,20,21,22,23]. Die von MACE erzielten Si-NWs haben normalerweise sehr raue und sogar poröse Oberflächen [18,19,20,21], was ihnen nur eine große spezifische Oberfläche und hervorragende Eigenschaften verleiht, was zu großen Anwendungspotenzialen in Biosensoren, thermoelektrischen Geräten, Lithium . führt -Ionenbatterien, Solarzellen usw. [22,23,24]. Um diese Anwendungen realisieren zu können, ist ein gutes Verständnis ihrer elektrischen Eigenschaften unabdingbar. Heutzutage werden häufig zwei Arten von Methoden angewendet, um die elektrischen Eigenschaften von Nanodrähten zu untersuchen. Eine wird mit gewöhnlichen makroskopischen Methoden durchgeführt, die relativ einfach durchzuführen ist, aber nur gemittelte Ergebnisse über eine große Anordnung von Nanodrähten liefern kann [24, 25]. Der andere wird an einzelnen Nanodrähten mit speziell hergestellten Einzelnanodraht-Vorrichtungen durchgeführt [21, 26, 27, 28], was den Einfluss von Größeninhomogenität ausschließen könnte, aber nicht einfach zu erreichen ist, insbesondere wenn die Eigenschaftsabhängigkeit gemessen wird. Daher werden dringend bequemere Methoden zur Untersuchung der elektrischen Eigenschaften einzelner NWs ohne komplexe Nanofabrikation benötigt.
In den letzten Jahrzehnten haben sich auf Rastersondenmikroskopie (SPM) basierende elektrische Messungen als leistungsfähige Techniken zur elektrischen Charakterisierung im Nanobereich erwiesen [29, 30]. Unter diesen SPM-Techniken wurde die leitfähige Rasterkraftmikroskopie (CAFM) erfolgreich angewendet, um die leitfähigen Eigenschaften einzelner oder einzelner Nanostrukturen zu untersuchen [30,31,32]. CAFM-Untersuchungen an einer Vielzahl von Nanodrähten wie ZnO, InAs, CdS, CdSe, GaAs, InAsSb und Si-NWs wurden bereits beschrieben [33,34,35,36,37,38]. Während sich die meisten Forschungen auf die leitfähigen Eigenschaften von Nanodrähten mit festen Parametern konzentrierten, wurden einige Untersuchungen durchgeführt, um die Dotierungsabhängigkeit der leitfähigen Eigenschaften zu untersuchen [37,38,39]. Die Größenabhängigkeiten der leitfähigen Eigenschaften von Nanodrähten wurden noch viel weniger untersucht. Über die durchmesserabhängigen Leitfähigkeitseigenschaften von Nanodrähten, auch nicht auf CAFM beschränkt, wurden nur wenige Studien berichtet, und ein beträchtlicher Teil davon befasste sich mit der Durchmesserabhängigkeit des spezifischen Widerstands von Nanodrähten [25, 40, 41, 42]. Einige Untersuchungen zu GaN-Nanodrähten ergaben beispielsweise, dass der spezifische Widerstand bei einem kritischen Durchmesser (20 ~ 80 nm, abhängig von den Herstellungsverfahren) hoch war und darüber hinaus unverändert blieb [41, 43], während andere Untersuchungen zu Si-Nanodrähten berichteten, dass der spezifische Widerstand der Nanodrähte nahm mit zunehmendem Durchmesser im Bereich von zehn bis Hunderten von Nanometern ab [40, 44]. Bei Halbleiter-Nanodrähten mit Metallkontakten kann die Schottky-Barriere eine wichtige Rolle in ihren leitenden Eigenschaften spielen. Daher sollte mit Ausnahme des spezifischen Widerstands die Schottky-Barriere in Gegenwart von Halbleiter-Nanodrähten berücksichtigt werden. Mehrere Veröffentlichungen haben sich auf die Durchmesserabhängigkeit der Schottky-Barrierehöhe (SBH) konzentriert, aber die Ergebnisse sind nicht konsistent. Calahorra et al. berechneten den SBH durch Lösen der Poisson-Gleichung in Nanodrähten und fanden einen klaren Trend zu erhöhter Barrierehöhe mit Größenreduktion [45]. Eine ähnliche Durchmesserabhängigkeit wurde experimentell von Soudi et al. bei der Untersuchung der durchmesserabhängigen Oberflächenphotospannung und Oberflächenzustandsdichte auf einem ZnO-Einzelnanodraht-Bauelement. Sie fanden heraus, dass die Höhe der Oberflächenbarriere mit abnehmendem Durchmesser (20–60 nm) zunahm, was durch die mit der Poisson-Gleichung simulierte Oberflächenzustandsdichte interpretiert wurde [46]. Scanning-Photostrom-Mikroskopie-Messungen an einzelnen Si-Nanodraht-Feldeffekttransistoren von Yoon et al. zeigten eine gegensätzliche Abhängigkeit, d. h. die Barrierenhöhe nahm mit abnehmendem Durchmesser aufgrund des Beitrags von Grenzflächenzuständen ab [47]. Eine weitere experimentelle Arbeit von Mao et al. an einzelnen Pt/ZnO-Nanonadel-Schottky-Dioden berichteten auch, dass die Barrierenhöhe mit abnehmendem Durchmesser abnahm, was durch einen Joule-Heizeffekt und/oder eine elektronische Inhomogenität der Grenzfläche erklärt wurde [48]. Daher ist die Durchmesserabhängigkeit der leitfähigen Eigenschaften von Nanodrähten bisher noch nicht einheitlich und noch lange nicht vollständig verstanden. Insbesondere die größenabhängigen Leitfähigkeitseigenschaften sowie größenabhängige SBH-Studien wurden nicht an einzelnen Si-NWs berichtet, die mit der MACE-Methode hergestellt wurden und eine für vielversprechende Anwendungen recht raue Oberfläche aufweisen.
In dieser Arbeit werden periodische Arrays von vertikal ausgerichteten Si-NWs mit unterschiedlichen Durchmessern und Längen durch die Methode von NSL kombiniert mit MACE hergestellt. Sowohl der Durchmesser als auch die Länge von SiNWs können durch Einstellen der Ätzzeit gut gesteuert werden. Die leitfähigen Eigenschaften einzelner Si-NWs innerhalb des Arrays werden ohne weitere Nanofabrikation durch CAFM untersucht, wodurch die größenabhängigen leitfähigen Eigenschaften einzelner Si-NWs bequem durch einfachen Austausch der Probe untersucht werden können. Die Ergebnisse zeigen, dass der an einzelnen Si-NWs gemessene Strom stark vom Durchmesser und der Länge der NWs abhängt. Si-NWs mit kleineren Durchmessern und kürzeren Längen weisen bessere Leitfähigkeitseigenschaften auf. Aus der I-V-Kurvenanpassung können größenabhängige Schottky-Barrierenhöhen erhalten werden, die als Schlüsselfaktor zur Bestimmung der größenabhängigen Leitfähigkeitseigenschaften von Nanodrähten dienen. Darüber hinaus wurde eine ähnliche größenabhängige SBH durch elektrostatische Kraftmikroskopie (EFM)-Messungen erhalten. Daher zeigt unsere Studie nicht nur die größenabhängigen Eigenschaften von Si-NWs, sondern legt auch nahe, dass CAFM ein wirksames Mittel sein kann, um die Größenabhängigkeit (oder andere Parameter) der leitfähigen Eigenschaften einzelner Nanostrukturen zu untersuchen.
Materialien und Methoden
Materialien
Die Si-Wafer wurden von MTI (China) bezogen. Die Suspensionen (2,5 Gew.-% in Wasser) von Polystyrolkugeln (PS, 490 nm Durchmesser) wurden von Duke Scientific (USA) bezogen. Aceton, Methanol, Schwefelsäure, Wasserstoffperoxid und Fluorwasserstoffsäure zur Herstellung von Si-NWs wurden von Sinopharm Chemical Reagent (China) bezogen. Entionisiertes Wasser (DI, 18,2 MΩ·cm) wurde aus einem Ultrafiltrationssystem (Milli-Q, Millipore, Marlborough, MA) erhalten
Herstellung von Si-NWs
Vertikal geordnete Silizium-Nanodraht-Arrays werden durch NSL in Kombination mit MACE hergestellt, die in früheren Literaturstellen ausführlich beschrieben wurden [49, 50]. Der Hauptherstellungsprozess ist in Abb. 1a geplant. Zunächst wurde eine Monoschicht aus Polystyrolkugeln (PS) mit einem Durchmesser von 490 nm auf dem chemisch gereinigten planaren Si-Wafer (n-Typ, 0,01 cm) selbstorganisiert, um eine hexagonal dicht gepackte Monoschicht zu bilden. Anschließend wurde die PS-beschichtete Probe durch reaktives Ionenätzen (RIE, Trion Technology) (50 W, 70 mTorr) mit O2 . geätzt Gas (20 sccm), um den Durchmesser von PS zu verringern, das in den folgenden Verfahren als Maskenschicht diente. Danach wurde ein 20 nm Au-Film durch Ionensputtern auf die Probe abgeschieden, die durch die PS-Schicht maskiert war, die als Katalysator für die folgende MACE-Behandlung diente. Die Probe wurde von MACE in HF (40%) und H2 . behandelt O2 (30 %) Mischlösung (Volumenverhältnis 4:1) bei Raumtemperatur. Beim MACE-Prozess wurde die mit Au bedeckte Si-Oberfläche effektiv geätzt, während die mit PS (ohne Au) bedeckte Oberfläche geschützt wurde, was zur Bildung von Si-NWs führte. Schließlich wurden die verbliebene Au-Schicht und PS-Kugeln durch Einweichen der Probe in KI/I2 . entfernt bzw. Tetrahydrofuranlösungen. Mit diesem Herstellungsverfahren können großflächige periodische Arrays von vertikal ausgerichteten Si-NW-Arrays erhalten werden.

a Schematische Darstellung der Verfahren zur Herstellung eines vertikal ausgerichteten Si-Nanodraht-Arrays. b Schematische Darstellung der Versuchsaufbauten für CAFM- und EFM-Messungen an einzelnen Si-Nanodrähten
Charakterisierung von Si-NWs
Die Morphologie der hergestellten Si-NWs wurde durch Rasterelektronenmikroskopie (REM, SIGMA300) überprüft, während ihre strukturellen Eigenschaften durch Raman-Spektroskopie (Jobin Yvon HR-Evolution 2-System) mit einer Anregungswellenlänge von 532 nm und einer geringen Leistung von etwa 1 mW . untersucht wurden .
Die elektrischen Eigenschaften von Si-NWs wurden durch CAFM und EFM mit einem kommerziellen SPM-Gerät (Multimode V, Bruker Nano Surfaces) untersucht, wie in Abb. 1b dargestellt. Cr/Pt-beschichtete Spitzen (Multi75E-G, Budget Sensors, Radius ca. 25 nm) wurden sowohl für CAFM- als auch für EFM-Messungen verwendet. Beim CAFM wurde die leitfähige Spitze im Kontaktmodus mit einer an das Substrat angelegten DC-Vorspannung über die Probenoberfläche abgetastet, während die Spitze geerdet war, und der Strom zwischen der Spitze und der Probe wurde gemessen. Da die anodische Oberflächenoxidation bei positiven Probenvorspannungen schwerwiegend ist, wurden alle Strombilder bei negativen Probenvorspannungen gemessen. In den CAFM-Experimenten wurden verschiedene negative Spannungen im Bereich von – 0,5 bis – 3,0 V getestet. Es wurde festgestellt, dass, wenn die Vorspannung unter – 1,5 V eingestellt wurde, der Strom für Proben mit schlechter Leitfähigkeit zu klein war, um erfasst zu werden. Während die Vorspannung auf – 2,0 V oder größer eingestellt wurde, waren die Messungen instabil, wahrscheinlich aufgrund der Beschädigung der Spitze und/oder der Probe unter einem großen elektrostatischen Feld. Daher wurde für Strombildmessungen eine Vorspannung von – 1,5 V gewählt. Die EFM-Messungen wurden an Si-NWs im Two-Pass-Modus durchgeführt. Im ersten Durchgang arbeitete es im Tapping-Modus, um das Topographiebild zu erhalten, während im zweiten Durchgang die Spitze hoch genug angehoben wurde, um die Van-der-Waals-Kraft zu ignorieren. Im angehobenen Durchgang wurde eine Gleichspannung zwischen Probe und geerdeter Spitze angelegt und das durch elektrostatische Kraft induzierte Phasenverschiebungssignal nachgewiesen. Alle Experimente wurden in einem fließenden N2 . durchgeführt Umgebungstemperatur für stabile elektrische Messungen und die Proben wurden 30 s lang in die HF-Lösung (5%) getaucht, um den Einfluss der Oxidschicht auf die leitfähige Charakterisierung effektiv zu reduzieren. Da die Messungen unmittelbar nach dem HF-Eintauchen durchgeführt wurden, sollte die reformierte Sauerstoffschicht dünn genug sein, um von der leitfähigen Spitze durchdrungen zu werden und ihre Auswirkung auf die Leitfähigkeit ist minimal.
Ergebnisse und Diskussionen
Herstellung von Si-NWs
Die Herstellung großflächiger vertikal ausgerichteter geordneter Si-Nanodraht-Arrays ist in Fig. 1a dargestellt. Durch Änderung der RIE-Zeit kann der Durchmesser von PS-Kugeln auf gewünschte Werte reduziert und somit Si-NWs mit kontrollierbarem Durchmesser erreicht werden. Die SEM-Bilder von Si-NWs, die nach 90, 120 und 150 s RIE-Ätzen erhalten wurden, sind in Abb. 2 a, b bzw. c dargestellt. Es kann beobachtet werden, dass die Si-NWs in einer großen Fläche in einer periodisch hexagonalen Anordnung vertikal ausgerichtet sind. Diese vertikal ausgerichteten Si-NWs haben dieselbe Periode von 490 nm und dieselbe Länge von ungefähr 350 nm (gleiche MACE-Zeit von 40 nm). Die Durchmesser der Si-NWs in (a), (b) und (c) betragen etwa 350, 260 bzw. 190 nm. Die Abhängigkeit des Durchmessers der NWs von der RIE-Ätzzeit ist in Abb. 2d aufgetragen und zeigt eine gute lineare Korrelation. Andererseits könnte die Länge der Nanodrähte durch Variieren der Zeit von MACE in HF und H2 . angepasst werden O2 gemischte Lösung. Die REM-Querschnittsbilder von Si-NWs nach 40, 60, 80 und 100 s MACE sind in Fig. 2e gezeigt. Es ist zu erkennen, dass die Länge der NWs von 350 auf 960 nm zunimmt, indem die MACE-Zeit erhöht wird. Ebenso zeigt die Länge der Si-NWs eine gute lineare Abhängigkeit von der MACE-Zeit, wie in Abb. 2f gezeigt. Diese Ergebnisse zeigen, dass geordnete Si-NWs mit kontrollierbaren Durchmessern und Längen erfolgreich durch die Methode der NSL in Kombination mit MACE hergestellt werden.
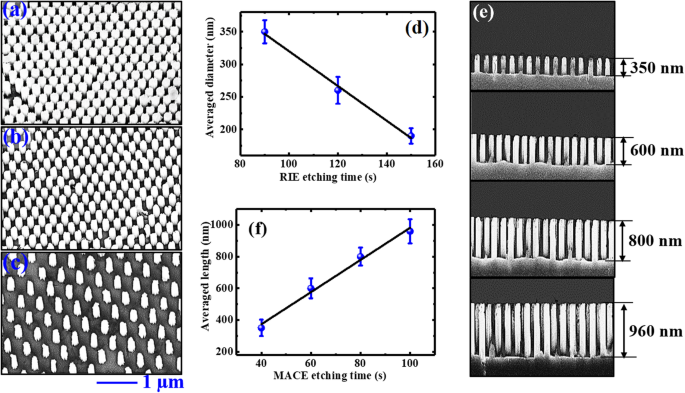
REM-Aufnahmen von oben von Si-NWs mit gleicher Länge von 350 nm, aber unterschiedlichen Durchmessern von a 350 nm; b 260 nm; und c 190 nm. Die Abhängigkeit des Durchmessers der NWs von der RIE-Ätzzeit ist in d . aufgetragen . e Querschnitts-REM-Aufnahmen von Si-NWs mit gleichem Durchmesser von 260 nm, aber unterschiedlichen Längen von 350, 600, 800 und 960 nm. f Stellt die Abhängigkeit der Länge der NWs von der MACE-Zeit dar.
Aus den REM-Bildern kann auch festgestellt werden, dass die Si-NWs nach dem chemischen Ätzen eine sehr raue Oberfläche haben und ihre Seitenwandoberfläche besonders rau ist. Um die Mikrostruktur der Oberflächenschicht in Abhängigkeit von Durchmesser und Länge zu überprüfen, wurden Raman-Spektren sowohl an Bulk-Si- als auch an Si-NWs mit unterschiedlichen Durchmessern und unterschiedlichen Längen gemessen. Jedes Spektrum wurde unter Verwendung der maximalen Peakintensität bei 520 cm − 1 . normalisiert , und die Ergebnisse für unterschiedliche Durchmesser und unterschiedliche Längen sind in Abb. 3a bzw. b gezeigt. Das Spektrum des Siliziumvolumens zeigt einen scharfen Peak bei ~ 520,1 cm − 1 . Sowohl die Rotverschiebung der Peakposition als auch die Verbreiterung der Peakbreite (bezeichnet als Halbwertsbreite, FWHM) kann auf Si-NWs beobachtet werden, wie in Abb. 3 c und d entsprechend aufgetragen. Die Spitzenrotverschiebung und -verbreiterung sind für Nanodrähte mit kurzen Längen von 350 und 600 nm eher gering und werden relativ offensichtlich, wenn die Nanodrahtlänge auf 800 nm und mehr ansteigt. Eine solche Rotverschiebung und Verbreiterung des Raman-Peaks wird manchmal den Änderungen des Dotierstoffgehalts oder des kristallinen Gehalts zugeschrieben. Gemäß der früheren Literatur [5, 51] könnte für die mit dem gleichen MACE-Verfahren hergestellten Si-NWs die Dotierungskonzentration das gleiche Dotierungsniveau wie der Ausgangswafer aufweisen. Aufgrund von Gerätebeschränkungen konnten wir dieses Ergebnis nicht bestätigen. Andererseits haben diese Si-NWs zwar eine raue Oberfläche, aber frühere Literaturangaben fanden, dass die mit der MACE-Methode hergestellten Si-NWs ihre Kristallstrukturen sowohl für n- als auch für p-Dotierungen und sowohl für leichte als auch für schwere Dotierungen hauptsächlich beibehalten konnten [5, 51 , 52]. Auf der Wandoberfläche der NWs wurde nur eine dünne amorphe Schicht beobachtet. Ähnliche Ergebnisse wurden von verschiedenen Gruppen an Si-NWs mit unterschiedlichen Durchmessern und Längen erhalten. Daher kann davon ausgegangen werden, dass die mit dem MACE-Verfahren hergestellten Si-NWs ihren Dotierstoffgehalt und ihren kristallinen Gehalt wie ihr massives Gegenstück mit Ausnahme der dünnen Oberflächenschicht fast unverändert beibehalten können.

Typische Raman-Spektren von Bulk-Si und Si-Nanodrähten mit a gleiche Länge von 350 nm aber unterschiedliche Durchmesser und b gleicher Durchmesser von 190 nm, aber unterschiedliche Längen. c und d repräsentieren die Rotverschiebung der Peakposition und die FWHM-Verbreiterung als Funktion der Nanodrahtlänge
Daher werden die Verschiebung und Verbreiterung des Raman-Peaks höchstwahrscheinlich durch die beschädigte raue Oberfläche der Nanodrähte induziert [53]. Es gibt mehrere Veröffentlichungen über die Raman-Ergebnisse von Si-NWs, die mit derselben MACE-Methode hergestellt wurden. Feser et al. fanden, dass die signifikante Peakverbreiterung bei 520 cm − 1 stieg mit der MACE-Zeit an und schrieb diese Peakverbreiterung der durch den Ätzprozess induzierten Kristallfehlordnung (z. B. Cluster von Punktdefekten) zu [23]. Lajvardiet al. fanden heraus, dass die Raman-Rotverschiebung mit der MACE-Zeit zunahm, d. e. der TO-Raman-Peak lag bei 521,1 cm − 1 für Bulk-Si und verschoben auf 518,7 cm − 1 für 80-min-geätzte Proben bzw. [54]. Sie stellten fest, dass der Ursprung der Raman-Verschiebung auf die Bildung von Si-Nanokristallen an der Wand des Nanodrahts zurückzuführen sein könnte. Linet al. beobachteten, dass sich der TO-Raman-Peak von 520 auf 516 cm − 1 . verschoben hat wenn die Länge der NWs von 0 (Bulk-Si) auf 2,73 µm zunimmt, während die Peakbreite von 3 auf 9 cm verbreitert wurde − 1 mit zunehmender NW-Länge von 0,19 auf 2,73 µm [55]. Sie dachten, dass die Raman-Peak-Verbreiterung von der Phononen-Dehnungs-Wechselwirkung dominiert wird und dass die Raman-Peak-Verschiebung proportional zur spannungsinduzierten Oberflächengitterverzerrung ist. Da die durch HF-Ätzen induzierte Spannung mit der Länge der NWs zunahm (mehr Ätzzeit), nahmen sowohl die Rotverschiebung als auch die Verbreiterung des Raman-Peaks mit zunehmender Länge der NWs zu. In unserem Fall können wir anhand der Raman-Spektren, wie in Abb. 3 a und b gezeigt, feststellen, dass sich der TO-Raman-Peak von 520 auf 519,4 cm − 1 . verschiebt wenn die Länge der NWs von 0 (bulk Si) auf 960 nm zunimmt, während die FWHM von 4,41 auf 4,47 cm verbreitert wird − 1 wenn die Länge der NWs von 350 auf 960 nm zunimmt. Wir ziehen es vor, dass diese längenabhängige Raman-Peak-Verschiebung und -Verbreiterung von der beschädigten Oberfläche (Beanspruchung oder Unordnung) herrührt. Aufgrund der sehr geringen Variation sowohl der Rotverschiebung als auch der Peakverbreiterung für Nanodrähte mit unterschiedlichen Durchmessern und unterschiedlichen Längen (< 1.0 cm − 1 ), kann die Veränderung der Belastung/Störung mit der Größe als minimal angesehen werden. Die Belastung/Störung kann also die Leitfähigkeit der NWs verändern, aber ihr Einfluss auf die Größenabhängigkeit der Leitfähigkeit wird in den nächsten Abschnitten nicht behandelt.
Leitfähigkeitsmessungen an einzelnen Si-NWs
Die Leitfähigkeitseigenschaften von Si-NWs werden mittels CAFM an einzelnen NWs mit unterschiedlichen Durchmessern und Längen gemessen. Typische Topographiebilder der vertikal ausgerichteten Si-NWs mit derselben Länge von 350 nm, aber unterschiedlichen Durchmessern von 350, 260 und 190 nm sind in Abb. 4 a, b bzw. c gezeigt, während ihre entsprechenden aktuellen Bilder an der Probe aufgenommen wurden Bias von − 1.5 V sind in (d), (e) und (f) dargestellt. Da die Cr/Pt-beschichtete AFM-Spitze ein Keil mit großem Winkel ist, ist zu beachten, dass die Si-NWs einen größeren Durchmesser aufweisen als ihre tatsächlichen. Darüber hinaus konnte der Strom aus den Nanodrähten nicht gut erfasst werden, da die Spitze möglicherweise keinen Kontakt mit dem Substrat hat, sodass nur die an den Nanodrähten gemessenen Ströme berücksichtigt werden. Aus den aktuellen Bildern ist zu erkennen, dass die meisten Kanten von Si-Nanodrähten eine etwas bessere Leitfähigkeit aufweisen als die Mitte. Dies kann durch einen Seitenkontakt zwischen der AFM-Spitze und dem Si-NW mit einer größeren Kontaktfläche verursacht werden. Darüber hinaus können aufgrund der offensichtlichen Rauheit auf der oberen Oberfläche einige Bereiche im mittleren Bereich auch einen großen Strom ähnlich dem Rand aufweisen, was zu keiner deutlichen ringförmigen Stromverteilung führt. Andererseits hängt die Leitfähigkeit von Si-NWs offensichtlich mit dem Durchmesser der Nanodrähte zusammen. Es ist zu erkennen, dass sowohl das Verhältnis der leitfähigen Fläche von Nanodrähten als auch die absoluten Stromwerte mit abnehmendem Durchmesser von 350 auf 190 nm deutlich ansteigen. Die Ergebnisse legen nahe, dass die Si-NWs mit kleineren Durchmessern leitfähiger sind als die mit größeren. Um die Durchmesserabhängigkeit intuitiver zu erhalten, sind in Fig. 4g die Stromverläufe entlang der markierten Linien in Abb. 4 d bis f dargestellt. Es zeigt sich deutlich, dass die Si-NWs mit einem Durchmesser von 190 nm viel leitfähiger sind als solche mit den Durchmessern von 260 nm und 350 nm. Eine solche Durchmesserabhängigkeit kann auch aus den statistischen Histogrammen der Stromverteilungen auf Si-NWs mit unterschiedlichen Durchmessern gewonnen werden, wie in Zusatzdatei 1:Abbildung S1(a) gezeigt, die zeigt, dass sich die Stromverteilung zu hohen Werten verschiebt, wenn der Durchmesser abnimmt. Die gemittelten Ströme (I av ) von Si-NWs werden berechnet, indem der Strom über alle Nanodrähte in den Strombildern gemittelt wird, was in Abb. 4h als Funktion des NWs-Durchmessers aufgetragen ist. Die durchschnittliche Strömung von Si-NWs zeigt einen dramatischen neunfachen Anstieg, wenn der Durchmesser der NWs von 350 auf 190 nm abnimmt. Eine ähnliche Stromabhängigkeit vom Durchmesser wurde sowohl bei einzelnen InAs-Nanodrähten als auch bei einzelnen Si-Nanodrähten erreicht [35, 47].

Die Topographiebilder von Si-NWs mit gleicher Länge von 350 nm aber unterschiedlichen Durchmessern von a 350 nm, b 260 nm, c 190 nm. Ihre entsprechenden Strombilder, die unter der Probenvorspannung von − 1.5 V erhalten wurden, sind in d . angegeben , e und f , bzw. Aktuelle Profile entlang der markierten Linien in d –f sind in g aufgetragen , und h zeigt den gemittelten Strom (I av ) über den Nanodrähten als Funktion des Durchmessers der NWs. Entsprechende Linien werden in den Topographiebildern von a . hinzugefügt –c und die Profilkurven in g sind zur Orientierung vertikal verschoben
Typische aktuelle Bilder von Si-NWs mit unterschiedlichen Längen und demselben Durchmesser von 190 nm, gemessen bei einer Probenvorspannung von − 1.5 V, sind in Abb. 5 dargestellt. Die Abbildungen 5 a bis d zeigen die aktuellen Bilder von Si-NWs mit den Längen von 350, 600, 800 bzw. 960 nm. Es ist zu sehen, dass in diesen Strombildern die leitfähigen Bereiche mit zunehmender Länge offensichtlich abnehmen, während die Abnahme des absoluten Stroms nicht so offensichtlich ist, insbesondere für die NWs mit einer Länge von 350 nm und 600 nm. Vielleicht aufgrund des Vorhandenseins lokaler unregelmäßiger Oberflächenrauhigkeit wurde an einigen Stellen in Fig. 5b sogar ein noch größerer Strom beobachtet. Trotzdem war der durchschnittliche Strom von Fig. 5b viel kleiner als der von Fig. 5a. Unter Verwendung der gleichen Analysen wie oben sind die Stromprofile entlang der markierten Linien in Abb. 5e dargestellt und die statistischen Histogramme sind in Zusatzdatei 1 gezeigt:Abbildung S1(b). Beide zeigen deutlich eine signifikante Stromabnahme mit zunehmender Länge der NWs. Die gemittelten Ströme der Nanodrähte als Funktion der NWs-Längen sind in Fig. 5f aufgetragen, und sie liegen in der Größenordnung von zehn bis hundert pA, was viel kleiner ist als die in Fig. 5 a bis e in der Größenordnung von nA . . Dies liegt daran, dass die Nanodrähte nur an wenigen leitenden Stellen einen relativ großen Strom zeigen, wenn die meisten Bereiche nicht leitend sind. Aus Abb. 5f zeigt der gemittelte Strom eine mehr als dreimalige Abnahme, wenn die Länge von 300 auf 960 nm zunimmt, was darauf hindeutet, dass die Leitfähigkeit der Nanodrähte mit zunehmender Länge abnimmt. Die Abhängigkeit des Nanodrahtwiderstands von der Länge wurde zuvor durch Vierpunkt-Widerstandsmessungen an Halbleiter-Nanodrähten untersucht, die darauf hindeuteten, dass der Widerstand des Nanodrahts unter ohmschem Kontakt mit seiner Länge linear mit der Steigung des spezifischen Widerstands zunahm [56, 57]. In unserem Fall ist die Abhängigkeit aus der Auftragung von I ~ 1/L, wie in Zusatzdatei 1:Abbildung S2 angegeben, bemerkenswert nichtlinear; daher konnte der spezifische Widerstand nicht korrekt aus der Kurvensteigung erhalten werden. Bei CAFM-Messungen ist zu beachten, dass der gemessene Gesamtwiderstand den Kontaktwiderstand zwischen Cr/Pt-beschichteten Spitzen und Si NW (R tipp/NW ), der Widerstand von Si NW (R NW ) und der Widerstand von Si-Wafern (R Massengut ). Da der mit CAFM gemessene Widerstand hauptsächlich von der lokalisierten Oberfläche unter der Spitze stammt und mit zunehmender Fläche entlang des Strompfads schnell abnimmt, R Massengut ist viel kleiner im Vergleich zu R NW und R tipp/NW . Andererseits ist aufgrund der sehr kleinen Metall-Halbleiter-Kontaktfläche zwischen Spitze und Nanodraht der Kontaktwiderstand R tipp/NW ist viel größer als der Nanodrahtwiderstand R NW . Die Nichtlinearität der Stromabhängigkeit von 1/L zeigt lediglich das Vorhandensein eines großen Kontaktwiderstands an. Daher sollte bei den Messungen durch CAFM besonders der Metall-Halbleiter-Übergangswiderstand berücksichtigt werden, bei dem die Schottky-Barriere eine wichtige Rolle spielt.

Die aktuellen Bilder von Si-NWs unter der Probenvorspannung von − 1.5 V mit dem gleichen Durchmesser von 190 nm aber unterschiedlichen Längen von a 350 nm, b 600 nm, c 800 nm und d 960 nm bzw. Die aktuellen Profile entlang der markierten Linien in a –d sind in e eingezeichnet , und f zeigt die gemittelten Ströme der Nanodrähte (I av ) als Funktion der Länge der NWs. Die Profilkurven in e sind zur Orientierung vertikal verschoben
Um die obige Schlussfolgerung zu verifizieren, wurden Strom-Spannungs-Kurven (I–V) an einzelnen Si-NWs aufgezeichnet, um die Schottky-Barriere am Metallspitze/Si-Nanodraht-Kontakt zu untersuchen. Typische I-V-Kurven auf den Si-NWs mit derselben Länge von 350 nm, aber unterschiedlichen Durchmessern sind in Abb. 6a dargestellt und die auf den Si-NWs mit dem gleichen Durchmesser von 190 nm, aber unterschiedlichen Längen sind in Abb. 6b dargestellt. Alle I-V-Kurven zeigen größere Ströme im negativen Probenspannungsbereich, in Übereinstimmung mit den typischen I-V-Kurven mit dem Schottky-Kontakt zwischen der Metallspitze und dem n-Halbleiter. Da die I-V-Kurven gute Metall-Halbleiter-Eigenschaften aufweisen, deutet dies darauf hin, dass der Einfluss der Sauerstoffschicht auf die Leitfähigkeit nicht gravierend ist und daher in der folgenden Diskussion als minimal angenommen wird. Inzwischen zeigen die Ergebnisse, dass kleinere und kürzere Nanodrähte eine größere Leitfähigkeit aufweisen als größere und längere, was gut mit den Ergebnissen aus aktuellen Bildern übereinstimmt. Für quantitative Analysen wird ein bekanntes thermionisches Emissionsmodell für einen Metall-Halbleiter-Kontakt verwendet [58, 59]. In diesem Modell können die I-V-Eigenschaften eines Schottky-Kontakts zu einem n-Typ-Halbleiter in Gegenwart eines Serienwiderstands angenähert werden als [59]:
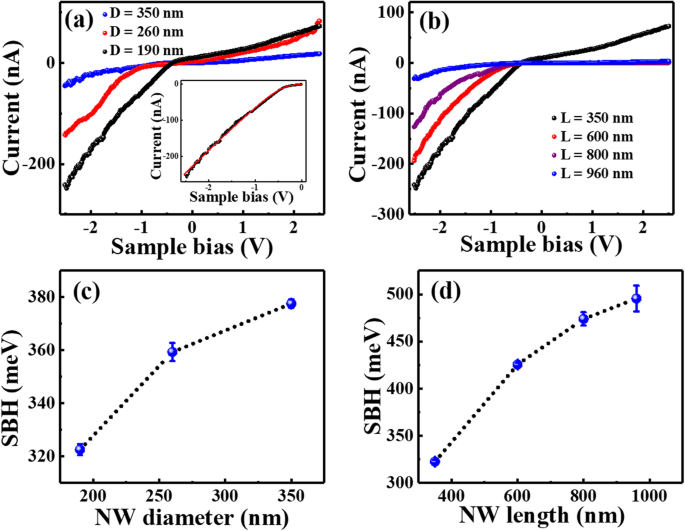
Typische I-V-Kurven auf den Si-NWs mit gleicher Länge von 350 nm aber unterschiedlichen Durchmessern (a ) und gleicher Durchmesser von 190 nm, aber unterschiedliche Längen (b ). Der Einsatz in a zeigt ein typisches Anpassungsergebnis von Si-NWs mit einem Durchmesser von 190 nm und einer Länge von 350 nm. c und d stellen die Schottky-Barrieren-Höhen dar, die aus den Anpassungsergebnissen als Funktion des Durchmessers bzw. der Länge der NWs erhalten wurden
$$ I={I}_S\left[\exp \left(\frac{q\left(VI{R}_S\right)}{\mathrm{n} kT}\right)-1\right], $ $ (1)wo n ist der ideale Faktor und R S ist der Serienwiderstand. Ich S ist der Sättigungsstrom, der ausgedrückt werden kann durch:
$$ {I}_S=\mathrm{AA}\ast {T}^2\exp \left(-\frac{\varphi_B}{kT}\right), $$ (2)wobei A die Kontaktfläche ist, A* die Richardson-Konstante und φ B ist die Schottky-Barrierehöhe (SBH) zwischen der Metallspitze und dem Si-Nanodraht. Somit kann SBH mit der Formel erhalten werden:
$$ {\varphi}_B=kT\ln\left(\frac{\textrm{AA}\ast {T}^2}{I_{\textrm{S}}}\right), $$ (3)Die I–V-Kurven in Abb. 6 a und b lassen sich gut nach Gl. (1), und eine typische Anpassungslinie im vorderen Bereich ist im Einschub von Fig. 6a gezeigt. Um die SBH-Werte aus dem Sättigungsstrom zu erhalten, wird angenommen, dass die effektive Richardson-Konstante A* ungefähr gleich der von Bulk-Silizium ist, d. h. 112 A cm – 2 K − 2 für Silizium vom n-Typ [59]. Die Kontaktfläche wird mit 2 × 10 − 11 . angenommen cm 2 indem der Cr/Pt-beschichtete Spitzenradius als 25 nm angenommen wird. Die SBH-Werte werden mit etwa 322, 359 und 377 meV für die Si-NWs mit der gleichen Länge von 350 nm und unterschiedlichen Durchmessern von 190, 260 bzw. 350 nm erhalten. Für Si-NWs mit gleichem Durchmesser von 190 µm und unterschiedlichen Längen von 350, 600, 800 und 960 µm betragen die SBH-Werte entsprechend 322, 425, 473 und 495 µmV. Zum Vergleich wurde eine typische I-V-Kurve an demselben Si-Wafertyp gemessen, wie in Zusatzdatei 1:Abbildung S3(a) gezeigt. Es zeigt deutlich, dass die Leitfähigkeit von Si-Wafern viel kleiner ist als die der hergestellten NWs. Der nachweisbare Strom konnte nur bei hohen Vorspannungen (− 4 ~ − 10 V) gemessen werden. Nach Anpassung der I-V-Kurven an das obige thermionische Emissionsmodell (Zusatzdatei 1:Abbildung S3(b)) wurde ein SBH-Wert von 0.60 eV für massives Si erhalten. Obviously, all of the measured SBH values for Si NWs with different diameters and lengths are smaller than that of the bulk Si. Similar Schottky barrier lowering in nanowires has been reported by different groups on different types of nanowires, which was attributed to the carrier recombination in depletion region [46, 60], barrier inhomogeneity and Joule heating effect [48], or image potential lowering [47]. In our case, the barrier lowering can be also attributed to the large density of surface states induced image potential lowering and carrier charging in depletion region.
The dependence of SBH values on nanowires’ diameter and length is plotted in Fig. 6 c and d respectively, and it can be found that the SBH increases obviously with the increasing of both nanowires’ diameter and length. In addition, the same measurements were done on Si NWs with different diameters of 260 and 350 nm for all lengths, and the I–V curves are shown in Additional file 1:Figure S4 a and b, respectively. The obtained diameter-dependent SBH values from curve fitting for all lengths are listed in Table 1 and plotted in Additional file 1:Figure S5. The results show that the SBH values increase with increased diameter for all lengths, and also increase with increased length for all diameters. Therefore, the results obtained from the I–V curves analyses suggest that the Schottky barrier lowering is more significant for the nanowires with smaller diameters and shorter lengths. On the other hand, the ideal factor n and series resistances R s of Si NWs with different diameters and lengths can also be obtained from the fitting results, as listed in Table 1. The results show that n is much larger than 1 for all nanowires (2.8 ~ 9.4), indicating that the contact between the tip and nanowire is not ideal metal-semiconductor contact, probably due to the existence of oxide layer. On the other hand, the R s increases with increased diameter as well as increased length. For example, R S increases from 6.1 to 21.6 MΩ as the diameter increases from 190 to 350 nm for the same length of 350 nm and increases from 6.1 to 32.3 MΩ for the length from 350 to 960 nm with the same diameter of 190 nm. The increase of R s with increased length is reasonable, while that increase with increased diameter is out of expectation. There is no good explanation for it at present, which may because that the series resistance is not simply the resistance of nanowire and the effective tip-nanowire contact area is not exactly equal to the nanowire’s sectional area. Nevertheless, the series resistances of Si NWs did be much smaller than the contact resistances, therefore the conductance of Si NWs should be dominated by the SBH determined contact resistance.
The origin of the size-dependent SBH is not very clear yet. The mechanism explanation for similar diameter dependence of SBH has been supposed in several literatures [45,46,47,48, 60]. For example, Leonard et al. interpreted this effect with the point of electron-hole recombination in depletion region [60]. As the recombination time decreased as the nanowire diameter was reduced, current density increased with decreasing nanowire diameter. Yoon et al. explained the diameter-dependent SBH using the presence of interface states [47]. Maoet al. attributed its origin to barrier inhomogeneity and Joule heating effect [48]. In our case, the Si NWs are made by the MACE method, so there inevitably exist an amount of defects on the surface and a reformed thin oxygen layer, resulting in a large density of surface states. Actually, from the enlarged SEM images and AFM observation, the top surface of Si NWs is very rough, further increasing the density of surface states. We think the presence of surface (or interface) states should be the main cause of the diameter dependence of SBH. According to previous literatures [47, 61, 62], the SBH lowering was interpreted by charged interface states. By adopting the cylindrical coaxial capacitor model used in reference [47], interface state–induced carrier transfer will form two opposite charged layers (metal and semiconductor contact surface) which generates an electric field opposite to the built-in electric field and lowers the barrier potential. As the surface state density increases with decreased nanowire diameter, smaller SBH is obtained on nanowires with a smaller diameter. Why the values of SBH related to the nanowire length is not clear yet. As the MACE time increased, the surface disorder or roughness increases correspondingly. Different changes in the surface microstructures may introduce different changes of SBH values, which need further investigations to work it out. Anyway, whatever the origin of size dependence of conductive properties, the size-dependent SBH lowering could result in higher conductance, which should be beneficial for practical applications.
EFM Measurements on Single Si NWs
To further verify the size-dependent SBH results of Si NWs obtained by CAFM, the EFM measurements were performed on the same samples and the EFM phase shift was measured as a function of applied DC bias. In previous literatures [63, 64], the relation between phase shift and electrostatic force has already been established, where the tip-sample system is roughly treated as a plane capacitor. When a bias is applied between the tip and the sample, the capacitive electrostatic force gradient would cause a phase shift. At a lifted height where the Van de Waals force can be ignored, the electrostatic force acted on the tip can be expressed as [63]:
$$ F=\frac{1}{2}\frac{\partial C}{\partial z}{\left({V}_{EFM}-{V}_{CPD}\right)}^2, $$ (4)wobei C , V EFM , und V CPD are the capacitance, applied DC voltage and contact potential difference (CPD) between the sample and tip, respectively. V CPD can be written as (φ Beispiel − φ Tipp )/e when the bias voltage V EFM was applied to the sample in our experiments. The phase shift detected by EFM is proportional to the gradient of the electrostatic force, which can be written as:
$$ \varDelta \varPhi =-\frac{Q}{k}\frac{\partial F}{\partial z}=-\frac{Q}{k}\left[\frac{1}{2}\frac{\partial^2C}{\partial {z}^2}{\left({V}_{EFM}-{V}_{CPD}\right)}^2\right], $$ (5)wo Q is the quality factor, k is the spring constant of the probe and z is the distance between tip and top of Si NW.
Aus Gl. (5), it can be seen that the EFM phase shift should be equal to zero at V EFM = V CPD . Therefore, V CPD can be achieved from the EFM measurements. The ΔΦ ~V EFM curves measured at a lift height of 100 nm on the individual Si NWs with different diameters and lengths are shown in Fig. 7 a and b as the scattered dots, respectively. By using Eq. (5), the ΔΦ ~V EFM curves can be fitted well, shown as the solid lines in Fig. 7 a and b. From the fitting parameters, the values of V CPD can be obtained, as presented in Fig. 7 c and d as a function of diameter and length respectively. The results show that the CPD values increase with increased diameter and increased length. Similar CPD results have been reported in a previous work performed by Kelvin probe force microscopy on ZnO NWs, in which the absolute value of CPD between ZnO nanowire and Pt/Ir tip also increased with increased diameter [65]. As diagrammed in Additional file 1:Figure S6, the value of SBH roughly equals to qV CPD plus E n (=E C − E F ). As E n is a constant for all Si NWs made from the same material, the size dependence of V CPD well represents the size dependence of SBH. Therefore, from the EFM results, it can be suggested that, the SBH values increase with the increasing of NWs’ diameter and length, well consistent with the results achieved by CAFM measurements. Similarly, the EFM measurements are performed on all series of Si NWs, and the diameter-dependent V CPD values at different lengths are shown in Additional file 1:Figure S7(a) and (b) respectively, which exhibit same diameter dependence as that obtained by CAFM.

∆Φ ~ V curves measured by EFM on individual Si NWs with a different diameters of 190, 260, and 350 nm (length = 350 nm) and b different lengths of 350, 600, 800, and 960 nm (diameter = 190 nm). c und d present the V CPD values obtained by curve fitting as a function of NWs’ diameter and length. The curves in a und b are vertically shifted for guidance
Schlussfolgerung
In summary, by a simple, low-cost method without involving any intricated procedures, Si NWs arrays with controllable diameters and lengths are prepared. Both the diameter and length of SiNWs can be well controlled by adjusting the etching time. The conductive properties include the current map and I–V curves are directly measured on individual Si NWs without complex nanofabrication procedure by the means of CAFM. Size-dependent conductance of Si NWs can be obtained from both the current images and I–V curves. Our results demonstrate that the Si NWs with a smaller diameter and shorter length exhibit better conductance. It can be attributed to the size dependence of SBH, which increased from 322 to 377 meV with the diameter increasing from 190 to 350 nm for the same length of 350 nm. Correspondingly, the SBH values increased from 322 to 495 meV as the length varies from 350 to 960 nm for the same diameter of 190 nm. The same size-dependent SBH can also be obtained from the EFM measurements. Such SBH lowering is interpreted by charged interface states. Therefore, our study not only reveals the size-dependent properties of Si NWs but also suggests that CAFM can act as an effective means to explore the size (or other parameters) dependence of conductive properties on individual nanostructures.
Verfügbarkeit von Daten und Materialien
The datasets used for supporting the conclusion are included in the article and the supporting file.
Abkürzungen
- CAFM:
-
Conductive atomic force microscopy
- CPD:
-
Contact potential difference
- EFM:
-
Electrostatic force microscopy
- MACE:
-
Metallunterstütztes chemisches Ätzen
- NSL:
-
Nanosphere lithography
- PS:
-
Polystyrene spheres
- RIE:
-
Reaktives Ionenätzen
- SBH:
-
Schottky barrier height
- SEM:
-
Rasterelektronenmikroskopie
- Si NWs:
-
Si nanowires
- SPM:
-
Scanning probe microscopy
Nanomaterialien



