Reduzierter Kontaktwiderstand zwischen Metall und n-Ge durch Einfügen von ZnO mit Argon-Plasmabehandlung
Zusammenfassung
Wir untersuchen die Metall-Isolator-Halbleiter-Kontakte auf n-Ge unter Verwendung einer ZnO-Grenzflächenschicht (IL), um den Fermi-Level-Pinning (FLP)-Effekt an der Metall/Ge-Grenzfläche zu überwinden und die Barrierehöhe für Elektronen zu reduzieren. Ein kleiner Leitungsbandversatz von 0,22 eV an der Grenzfläche zwischen ZnO und n-Ge wird erhalten, und die ZnO-IL führt zu einem deutlich reduzierten Kontaktwiderstand (R c ) in Metall/ZnO/n-Ge im Vergleich zum Steuergerät ohne ZnO, aufgrund des Wegfalls von FLP. Es wurde beobachtet, dass die Argon (Ar)-Plasmabehandlung von ZnO das R . weiter verbessern kann c Eigenschaften in Al/ZnO/n-Ge-Geräten, was darauf zurückzuführen ist, dass die Ar-Plasmabehandlung die Konzentration der Sauerstoffleerstelle erhöht V o , die als n-Typ-Dotierungsmittel in ZnO wirken. Der ohmsche Kontakt wird in Al/ZnO/n-Ge mit einer Dotierstoffkonzentration von 3 × 10 16 . demonstriert cm −3 Inge. Auf dem stark dotierten n + -Ge mit einem Phosphorion (P + ) Implantation, ein spezifischer Kontaktwiderstand von 2,86 × 10 – 5 Ω cm 2 wird erreicht in Al/ZnO/n + -Ge mit Ar-Plasmabehandlung.
Hintergrund
Germanium (Ge) hat aufgrund seiner höheren Ladungsträgerbeweglichkeiten im Vergleich zu Si viel Aufmerksamkeit für die fortschrittlichen Metall-Oxid-Halbleiter-Feldeffekttransistoren (MOSFETs) auf sich gezogen [1, 2]. Bei den Ge-p-Kanal-MOSFETs wurden große Fortschritte beim Wachstum von verspannten Ge-Kanälen [3,4,5], Oberflächenpassivierung [6,7,8,9] und Source/Drain (S/D)-Kontakten [ 10], und die ultra-skalierten Ge-pFinFETs [11] haben die überlegene elektrische Leistung gegenüber den Si-Bauelementen demonstriert. Ge-n-Kanal-Transistoren hingegen stehen noch vor Herausforderungen, die das Hindernis für die Integration von Ge-CMOS darstellen, darunter die schlechte Grenzflächenqualität, die zu einer geringen Elektronenmobilität führt, und der hohe S/D-Widerstand aufgrund der begrenzten Aktivierung Rate von n-Dotierstoffen in Ge [12] und Fermi-Level-Pinning (FLP) an der Metall/n-Ge-Grenzfläche [13]. FLP führt bei den meisten Metallen auf n-Ge zu einer Schottky-Barrierehöhe von etwa 0,5 eV für Elektronen, was den sehr großen Kontaktwiderstand R . erzeugt c [13,14,15].
Das Depinning auf Fermi-Niveau kann durch Einfügen einer dünnen Grenzschicht (IL) erfolgen, z. B. TiO2 [16] und ZnO [17], zwischen den Metallen und n-Ge [18], da die dünne IL die Metallwellenfunktion in Ge blockieren kann, um die metallinduzierten Lückenzustände zu reduzieren [19, 20]. ZnO hat einen kleinen Leitungsband-Offset (CBO) gegenüber Ge, was zu einem kleineren R . führen kann c in Metall/ZnO/n-Ge, im Vergleich zu Metall/TiO2 /n-Ge mit TiO2 /Ge mit positivem CBO [16]. Die Dielektrizitätskonstante von ZnO ist kleiner als die von TiO2 , so dass ZnO IL im Vergleich zu TiO2 . einen dünneren Verarmungsbereich zwischen dem Metall und n-Ge erhalten kann . Darüber hinaus ist es einfach, eine n-Dotierung in ZnO zu realisieren, indem nichtstöchiometrische Defekte eingeführt werden, wie z. B. Sauerstoffleerstellen V o [21, 22], was zu einer noch kleineren ZnO-Verarmungsregion zwischen dem Metall und n-Ge führt. Bisher ist bei Metall/ZnO/n-Ge-Kontakten die Dotierung von ZnO um V o wurde durch Tempern in Stickstoffatmosphäre [16] durchgeführt, was jedoch zur Interdiffusion von ZnO und Ge während des Temperns [23] und zur Diffusion von Dotierstoffatomen in n-Ge während des Temperns [24, 25] führen könnte, die eine Verschlechterung der aktuellen Leistung des Geräts verursacht. Da muss ein Niedertemperaturprozess zum Abscheiden und Dotieren von ZnO entwickelt werden.
In dieser Arbeit untersuchen wir die Depinning des Fermi-Niveaus an der Grenzfläche zwischen Metall und n-Ge durch Insertion von ALD-abgelagertem ZnO IL. Die Verbesserungseffekte einer Argon (Ar)-Plasmabehandlung der ZnO-Schicht auf die Kontaktwiderstandseigenschaften von Al/ZnO/n-Ge werden untersucht.
Methoden
Sowohl auf leicht als auch auf stark dotierten n-Ge(001)-Wafern wurden Metallkontakte gebildet. Die leicht dotierten Ge-Proben haben eine Dotierungskonzentration von etwa 3 × 10 16 cm −3 . Um das stark dotierte n-Ge zu erreichen, wird ein Phosphorion (P + ) Implantat mit einer Dosis von 1 × 10 15 cm −2 und eine Energie von 30 keV wurde an dem n-Ge(001) durchgeführt, gefolgt von einem schnellen thermischen Tempern bei 600 °C für 60 s. Nach der Waferreinigung mit mehreren Zyklen von entionisiertem Wasser und verdünnter HCl wurden die Ge-Wafer sofort in die ALD (Beneq TSF-200)-Kammer geladen, um ZnO abzuscheiden, und dann wurden Aluminium (Al)-Kontakte durch Sputtern auf Ge unter Verwendung eines Abhebeprozesses abgeschieden . Hier wurden drei ZnO-Dicken von 1, 2 und 3 nm verwendet, die durch spektroskopische Ellipsometrie (SE) bestätigt wurden (J. A. Woollam M2000). Während der ZnO-Abscheidung werden Diethylzink (DEZn) und entionisiertes Wasser (H2 O) wurden als Zn- bzw. O-Vorstufen verwendet, und die Substrattemperatur wurde auf 150 °C gehalten, um die Bildung von GeOx . zu verhindern . Der detaillierte ZnO-Abscheidungsprozess unter Verwendung von ALD wurde in unseren früheren Arbeiten in Lit. beschrieben. [26, 27]. Um die Leitfähigkeit des ZnO-Films weiter zu verbessern, wurden einige ZnO-auf Ge-Proben mit Argon (Ar)-Plasma behandelt. Eine Kontroll-Al/n-Ge-Probe ohne ZnO-IL wurde ebenfalls hergestellt. Die R c von Al auf ZnO/Ge wurde unter Verwendung des Circular Transmission Line-Verfahrens (CTLM) extrahiert, das durch Abheben gebildet wurde. Das freigelegte ZnO wurde durch Plasmaätzen vollständig geätzt, um eine vollständige Isolierung zwischen benachbarten Bauelementen sicherzustellen [16].
Keithley 4200 SCS wurde verwendet, um die elektrischen Eigenschaften der Al/ZnO/n-Ge-Kontrakte und CTLM-Strukturen zu messen, hochauflösendes Transmissionselektronenmikroskop (HRTEM) und Röntgenphotoelektronenspektroskopie (XPS) wurden verwendet, um die Mikrostruktur und Grenzfläche zu bestimmen Eigenschaften der Proben, und ein UV-VIS-Spektrophotometer (LAMBDA 950, PerkinElmer) wurde verwendet, um die Bandlücke E . zu bestimmen g des abgeschiedenen ZnO-Films.
Ergebnisse und Diskussion
Materialcharakterisierung von Al/ZnO/n-Ge
Die XPS-Valenzbandspektren von Ge/ZnO und das Transmissionsspektrum von ZnO sind in den Fig. 1 und 2 dargestellt. 1 bzw. 2, die verwendet wurden, um den Mechanismus des Depinning-Effekts des Fermi-Niveaus an der Al/ZnO/n-Ge-Grenzfläche zu untersuchen. Wir haben die XPS-Messungen für eine dicke ZnO-Probe, eine ZnO/n-Ge-Grenzflächenprobe und eine reine Ge-Probe durchgeführt, um den Valenzband-Offset (VBO) von ZnO/Ge zu erhalten, wie in Fig. 1 gezeigt. Das Zn 2 p Peakposition und VBM für dicke ZnO-Proben betragen 1021,9 eV bzw. 2,59 eV. Das Zn 2p und Ge 3d Peakposition für die ZnO/Ge-Grenzflächenprobe sind 1021,7 eV bzw. 29,1 eV. Die Ge 3d Peakposition und VBM für reine Ge-Probe betragen 29 eV bzw. 0,06 eV. Dies weist darauf hin, dass die VBO von ZnO/Ge 2,33 eV beträgt [30].

XPS-Spektren für Valenzbänder einer ZnO/Ge-Probe. a Zn 2p und b Valenzbandspektren für eine dicke ZnO-Probe c ZnO 2p und d Ge 3d Spektren für ZnO/Ge-Grenzflächenprobe und e Ge 3d und f Valenzbandspektren für eine Ge-Masseprobe
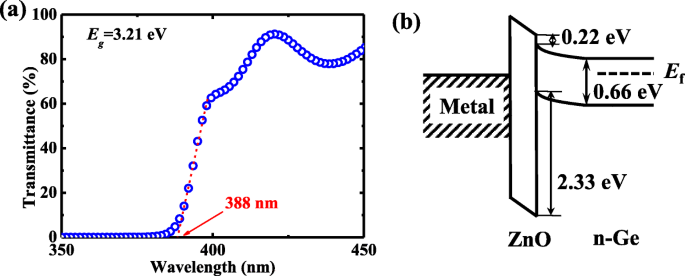
a Transmissionsspektrum für den abgeschiedenen ZnO-Film, der das E . zeigt g von 3,21 eV. b Die Bandausrichtung für Al/ZnO/Ge-Kontakt
Abbildung 2a zeigt das Transmissionsdiagramm, das aus der UV-VIS-Spektroskopie für eine dicke ZnO-Probe erhalten wurde, und das E g von ZnO wird mit 3,21 eV bestimmt, was mit den berichteten Werten in [28, 29] übereinstimmt. Mit dem erhaltenen E g von ZnO und VBO oben wird ein CBO von 0,22 eV zwischen ZnO und Ge bestimmt, wie in Abb. 2b gezeigt. Dies deutet darauf hin, dass Depinning auf Fermi-Niveau an der Al/n-Ge-Grenzfläche unter Verwendung der ZnO-Einfügungsschicht erreicht werden kann, die das niedrige R . erzeugen kann c für Al/ZnO/n-Ge-Kontakt.
Abbildung 3 zeigt das TEM-Bild der Al/ZnO/n-Ge-Struktur mit einer ZnO-Dicke von 3 nm. Zwischen Al und n-Ge wird eine gleichmäßige und konforme ZnO-Schicht beobachtet. Der Einschub in der oberen rechten Ecke zeigt das HRTEM-Bild der vergrößerten Ansicht der Al/ZnO/n-Ge-Grenzfläche. Die Dicke des ZnO-Films wird mit 3 nm gemessen, was mit dem Ergebnis der SE-Messung übereinstimmt, und der ZnO-Film liegt in einer amorphen Form vor.
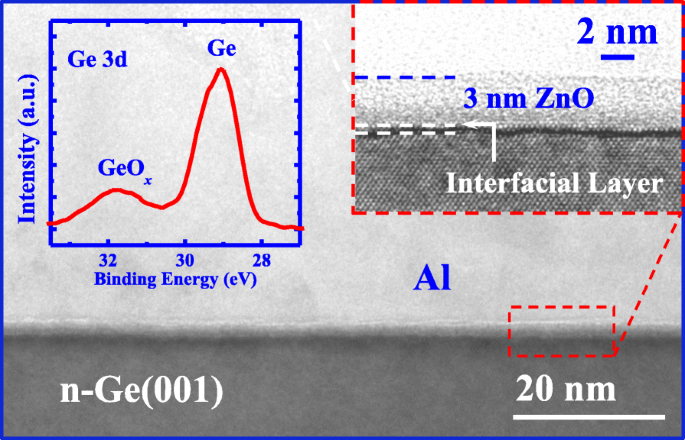
TEM-Aufnahme einer Al/ZnO/n-Ge-Probe, die die gleichmäßige ZnO-Schicht zwischen Al und Ge zeigt. Der obere rechte Einschub zeigt das HRTEM-Bild der Al/ZnO/n-Ge-Grenzfläche und der obere linke Einschub zeigt das XPS Ge 3d Ergebnis der Probe, das die Existenz von GeOx . beweist Grenzschicht
Ein dünnes GeOx Zwischen Ge und ZnO wird eine Grenzschicht gebildet, die im Vergleich zu [31] aufgrund der niedrigeren Abscheidungstemperatur in dieser Arbeit viel kleiner ist. Dies wird der Tatsache zugeschrieben, dass während der Abscheidung von ZnO Ge mit der O-Vorstufe reagiert, was zur Bildung von GeOx . führt IL. GeOx wird auch durch das XPS Ge 3d . demonstriert resultieren in der Einfügung in der oberen linken Ecke.
Die elektrische Leitfähigkeit des ZnO-Films kann durch eine Ar-Plasmabehandlung verbessert werden, was eine Zunahme der Konzentration von Sauerstoffleerstellen verursacht V o , die als Donoren in ZnO fungieren [32, 33]. Abbildung 4 zeigt die XPS-Ergebnisse von O 1s für ZnO im abgeschiedenen Zustand und die Probe mit Ar-Plasmabehandlung mit einer Leistung von 50 W, einem Ar-Gasfluss von 60 sccm und einer Dauer von 45 s. Die O 1s Peak wird unter Verwendung der Gaußschen Anpassung in zwei Peaks entfaltet. Der Peak bei ~ 530 eV entspricht dem Gittersauerstoff in ZnO [34, 35]. Für die abgeschiedene Probe entspricht der Peak bei 531,7 eV V o (~ 531,5 eV) und chemisorbierter Sauerstoff auf der Oberfläche von dünnen ZnO-Filmen, wie Carbonyl- und Hydroxylgruppen [35, 37]. Bei der Probe mit Ar-Plasmabehandlung liegt der Peak bei ~ 531,5 eV, was sich zu einer niedrigeren Bindungsenergie verschiebt und im Vergleich zur abgeschiedenen Probe viel ausgeprägter wird, was darauf hindeutet, dass mehr V o werden aufgrund der Ar-Plasmabehandlung erzeugt, und chemisorbierter Sauerstoff wird effektiv entfernt. Die Zunahme von n-Dotierstoffen in ZnO führt zu einer dünneren Tunnelbarriere und einem niedrigeren Serienwiderstand an der Grenzfläche, was für die Verringerung von R . verantwortlich ist c [36].

XPS-Ergebnisse von O 1s und die entfalteten Ergebnisse für wie abgeschiedene (oben) und Ar-plasmabehandelte (unten) ZnO (3 nm)/n-Ge-Proben
Wir haben die XPS-Messungen mit einer dicken ZnO-Probe und einer ZnO/Ge-Grenzflächenprobe mit und ohne Ar-Plasmabehandlung durchgeführt, wie in Abb. 5 gezeigt. Wir haben festgestellt, dass es nach der Ar-Plasmabehandlung eine Verschiebung von − 0,05 eV gab. Dies kann darauf hindeuten, dass der ZnO/Ge-VBO nach der Ar-Plasmabehandlung etwa 2,38 eV und der CBO-Wert 0,17 eV beträgt.

VBM für ZnO/Ge-Grenzflächenprobe mit und ohne Ar-Plasmabehandlung. a Zn 2p und b Valenzbandspektren für eine dicke ZnO-Probe c ZnO 2p Spektren für ZnO/Ge-Grenzflächenprobe. d Bandausrichtungsdiagramm für Ar-plasmabehandeltes Metall/ZnO/n-Ge
Elektrische Leistung von Al/ZnO/n-Ge-Kontakten
Abbildung 6a zeigt die gemessene Stromdichte J als Funktion der angelegten Spannung V Eigenschaften für Al-Kontakte auf leicht dotiertem n-Ge. Das Al/ZnO/n − -Ge-Geräte haben unterschiedliche Dicken der ZnO-Schicht. Das Schema des Geräts ist im Einschub von Abb. 6 dargestellt.
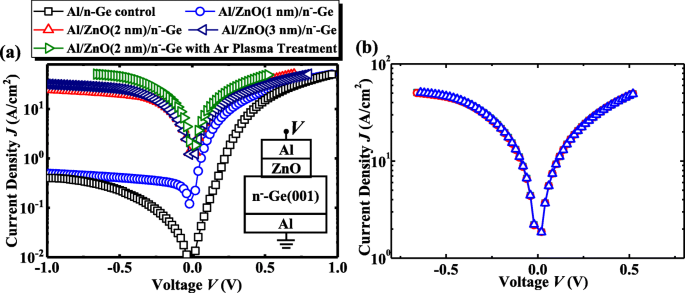
a J -V Kennlinien für Al/n − -Ge-Steuerung, Al/ZnO/n − -Ge mit ZnO-Dicken von 1 nm, 2 nm und 3 nm und Al/2 nm Ar plasmabehandeltes ZnO/Ge, b J -V-Kennlinie für drei mit Al/2 nm Ar plasmabehandelte ZnO/Ge-Bauelemente
Wie vorhergesagt, zeigt das Al/n-Ge-Steuergerät ohne ZnO die gleichrichtenden Eigenschaften mit der hohen Barrierehöhe für Elektronen aufgrund des Fermi-Niveaus-Pinning bei Al/n − -Ge [38]. Verglichen mit der Kontroll-Al/n-Ge-Probe ohne ZnO weisen Al/ZnO/n-Ge-Geräte die verbesserte Umkehrung J . auf , was auf das Fermi-Niveau-Depinning zurückzuführen ist, das durch die Reduktion von Metall-induzierten Lückenzuständen (MIGS) an der Metall/Ge-Grenzfläche induziert wird [18, 19]. Diese Verbesserung wird mit dickerem ZnO noch verstärkt, was darauf zurückzuführen ist, dass mehr MIGS eliminiert werden. Aber die Durchlassstromdichte für ein 3 nm-ZnO-eingefügtes Gerät ist kleiner als die eines 2 nm-Geräts. Dies kann wie folgt erklärt werden. Die Hauptstromdichte für Al/ZnO/n-Ge ist der Tunnelstrom. Wenn das ZnO nicht dick genug ist, wird MIGS nicht effektiv eliminiert und es zeigt immer noch gleichrichtende Eigenschaften. Wenn das ZnO jedoch zu dick ist, dominiert der Serienwiderstand von ZnO den gesamten Widerstand und der Strom wird kleiner. Es gibt also einen Kompromiss zwischen der Eliminierung von MIGS und der Erhöhung des Serienwiderstands von ZnO, und somit gibt es eine kritische Dicke für die IL [19]. Zusammenfassend wird angenommen, dass 2 nm die optimale Dicke für den Al/ZnO/n-Ge-Kontakt ist.
Bei der Ar-Plasmabehandlung ist die Leistung von Al/ZnO/n − -Ge Gerät wird weiter verbessert. Was auch immer für das Rückwärts- oder Vorwärts-Sweepen der angelegten Spannung V , Al/2 nm ZnO/n − -Ge-Gerät mit Ar-Plasmabehandlung erreicht das verbesserte J im Vergleich zum Gerät mit 2 nm ZnO oder 3 nm ZnO, was darauf zurückzuführen ist, dass ein großer Betrag von V o werden im ZnO-Film während der Ar-Plasmabehandlung erzeugt. Die höhere Dotierungskonzentration in ZnO kann den Serienwiderstand von ZnO effektiv reduzieren und die Tunnelbarriere für Elektronen an der Grenzfläche zwischen ZnO und Al verringern, wodurch die Tunnelstromdichte verbessert wird.
Abbildung 6b zeigt J -V Kennlinien für drei Al/2 nm ZnO/n − -Ge-Gerät mit Ar-Plasmabehandlung. Es ist klar, dass die J für verschiedene Geräte ist nahezu gleich, was darauf hindeutet, dass sowohl der ALD-Prozess als auch die Ar-Plasmabehandlung einen einheitlichen Effekt auf die Verbesserung der Stromdichte haben.
Ohmsche Kontakte erhält man für Al/2 nm ZnO/n − -Ge ohne und mit unterschiedlicher Ar-Plasmabehandlungsdauer von 15 s, 30 s, 45 s bzw. 60 s, die in Abb. 7 gezeigt sind.

Ich –V Kurven bei Al/2 nm ZnO/n − -Ge mit verschiedenen d a ohne Ar-Plasmabehandlung und mit Ar-Plasmabehandlung Dauer b 15 s, c 30 s, d 45 s und e 60 s
Der rohe Gesamtwiderstand R tot zwischen zwei Kontakten nimmt mit der Abnahme von d . ab , und das letzte R tot wird durch einen Korrekturfaktor C modifiziert, der mit der Gleichung C . berechnet wird = (L /d )·ln(1 + d /L ) [39], wobei L = 25 μm steht für den Radius des inneren Pads, wie im Einschub in Abb. 8a dargestellt. Durch Auftragen des R tot als Funktion von d in Abb. 8a der Schichtwiderstand R sch der n − -Ge kann aus der Steigung der Linie erhalten werden, und dann ρ c wird aus dem Schnittpunkt der linearen Anpassungslinie mit der vertikalen Achse berechnet. Für Al/2 nm ZnO/n − -Ge-Gerät ohne Ar-Plasmabehandlung, das ρ c ist 6,87 × 10 −2 Ω cm 2 , aber nach 45 s Ar-Plasmabehandlung ergibt sich eine 17,2-fache Reduzierung im Vergleich zu der ohne Ar-Plasmabehandlung und hat den Kontaktwiderstand ρ c von 3,66 × 10 −3 Ω cm 2 . Wir vergleichen die Werte von ρ c für Al/2 nm ZnO/n − -Ge-Geräte mit unterschiedlichen Ar-Plasmabehandlungsdauern in Abb. 8b. Es wird beobachtet, dass ρ c des Gerätes nimmt mit der Behandlungszeit bis zu 30 s ab. Da die Behandlungszeit jedoch länger als 30 s ist, ρ c bleibt fast gleich. Die Reduzierung von ρ c kann auf die Dotierung von ZnO zurückgeführt werden, also auf die Verringerung der Tunnelbarriere und des Serienwiderstands, wie bereits erwähnt. Es gibt jedoch keine beobachtbare Änderung des Schichtwiderstands von n − -Ge, was darauf hinweist, dass die Leitfähigkeit von n − . nicht beeinflusst wird -Ge mit Ar-Plasmabehandlung.
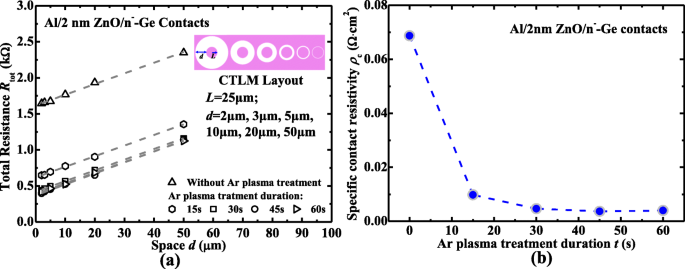
a R tot gegen d Kurven für das CTLM mit Al/2 nm ZnO /n − -Ge-Kontakte mit unterschiedlicher Ar-Plasmabehandlungsdauer, Einschub in Fig. 5a ist die Information der CTLM-Struktur, die in dieser Arbeit verwendet wird. b ρ c versus unterschiedliche Behandlungsdauer mit Ar-Plasma
CTLM-Struktur mit Al-Kontakten auf stark dotiertem Ge wird verwendet, um die Kontaktwiderstandscharakteristik von Al/2 nm ZnO/n + . zu untersuchen -Ge. Die ZnO-Schicht wurde 45 s lang einer Ar-Plasmabehandlung unterzogen. Abbildung 9a zeigt das gemessene I -V Kurven zwischen den Al-Kontakten mit unterschiedlichen d , was die hervorragende ohmsche Leistung zeigt. Abbildung 9b zeigt den R tot als Funktion von d für Al/2 nm ZnO/n + -Ge CTLM und R sch und ρ c werden zu 64 Ω/□ und 2,86 × 10 −5 . extrahiert Ω cm 2 , bzw.
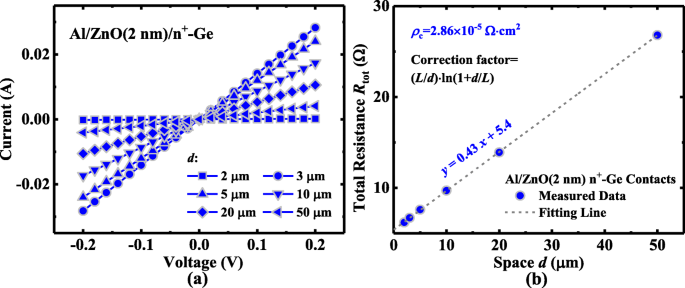
a Ich –V Kurven bei Al/ZnO(2 nm)/n + -Ge mit verschiedenen d mit ZnO behandelt unter Verwendung von Ar-Plasma. b R tot gegen d Kurven für das CTLM mit Al/ZnO(2 nm)/n + -Ge-Kontakte
Wir vergleichen die ρ c von ZnO behandelt durch Ar-Plasma Al/ZnO/n + -Ge-Geräte in dieser Arbeit mit denen in der Literatur berichteten, wie in Abb. 10 gezeigt. Für das stark dotierte n + -Ge-Kontaktprobe, Al/ZnO/n + -Ge-Kontakte zeigten das kleinere ρ c im Vergleich zu denen von Ni/GeSn [40, 41], Ni/Ge [42], Ti/n + -Ge in Ref.-Nr. [31] und Ti/TiO2 /GeO2 /Ge [31], kohlenstoffimplantiertes Ni/Ge [42] und Ti/n + -SiGe/n-Ge [43]. Metallische ohmsche Kontakte wie Ni/Ge, Ni/GeSn, Ti/Ge und kohlenstoffimplantiertes Ni/Ge leiden unter starkem Pinning auf Fermi-Niveau, was zu einem großen ρ . führt c . Für Ti/TiO2 /GeO2 /Ge-Kontakt wurde durch die Doppelschicht aus 1 nm TiO2 . ein großer Tunnelwiderstand eingeführt /1,5 nm GeO2 IL, die die Eigenschaften des spezifischen Kontaktwiderstands verschlechtert. Aber die ρ c in dieser Arbeit ist größer als die in Ref. [44]. Wir gehen davon aus, dass dies an dem viermal größeren P + . liegen könnte Implantationsdosis als die in unserer Arbeit. Eine höhere Implantationsdosis ermöglicht die stärkere Oberflächendotierung von n + -Ge, was zu einer dünneren Schottky-Barriere und einem kleineren ρ . führt c . Wir glauben, dass bei stärkerer Dotierung von n + -Ge in Al/ZnO/n + -Ge-Geräte, kleiner ρ c ergibt.
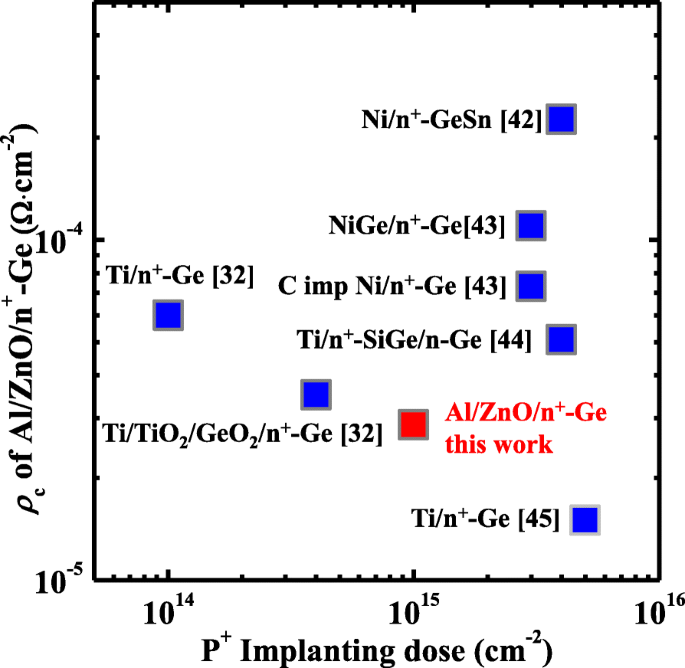
Vergleich von ρ c von Al/ZnO/n + -Ge in dieser Arbeit mit denen anderer gemeldeter Kontakte, mit P + Implantationsdosis als x Achse
Schlussfolgerungen
Der durch ZnO IL induzierte Depinning-Effekt auf dem Fermi-Niveau in den Al/ZnO/n-Ge-Strukturen wird untersucht. Die XPS-Messung zeigte einen kleinen CBO von 0,22 eV bei ZnO/n-Ge, d. h. es findet eine Eliminierung von FLP statt, was zu den ohmschen Metallkontakten auf n-Ge führt. Es wird weiter berichtet, dass die Ar-Plasmabehandlung von ZnO zu einer Erhöhung der Konzentration von V . führt o , die als n-Typ-Dotierungsmittel in ZnO wirken, was das R . verbessert c Leistung in Al/ZnO/n-Ge-Geräten. Ohmsche Metallkontakte erhält man auf n − und n + -Ge mit dem mit Ar plasmabehandelten ZnO IL. Basierend auf den CTLM-Strukturen werden Werte von ρ c 3,66 × 10 −3 Ω cm 2 und 2,86 × 10 − 5 Ω cm 2 werden in Al/2 nm ZnO/n − . erreicht -Ge und Al/2 nm ZnO/n + -Ge bzw. mit der Ar-Plasmabehandlung von ZnO bei einer Leistung von 50 W für 45 s.
Abkürzungen
- Al:
-
Aluminium
- ALD:
-
Atomlagenabscheidung
- Ar:
-
Argon
- CBO:
-
Leitungsband-Offset
- CTLM:
-
Zirkulares Übertragungsleitungsverfahren
- DEZn:
-
Diethylzink
- E g :
-
Bandlücke
- FLP:
-
Fermi-Level-Pinning
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxid
- GeSn:
-
Germaniumzinn
- HCl:
-
Salzsäure
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- IL:
-
Grenzschicht
- MIGS:
-
Metallinduzierte Lückenzustände
- MOSFETs:
-
Metall-Oxid-Halbleiter-Feldeffekttransistoren
- Ni:
-
Nickel
- P + :
-
Phosphorion
- R c :
-
Kontaktwiderstand
- R tot :
-
Roher Gesamtwiderstand
- SE:
-
Spektroskopische Ellipsometrie
- Si:
-
Silizium
- Ti:
-
Titan
- TiO2 :
-
Titandioxid
- UV-VIS:
-
Ultraviolett – sichtbar
- VBO:
-
Valenzband-Offset
- V o :
-
Sauerstoff-Stelle
- XPS:
-
Röntgenphotoelektronenspektroskopie
- ZnO:
-
Zinkoxid
- ρ c :
-
Spezifischer Kontaktwiderstand
Nanomaterialien
- Was ist der Unterschied zwischen Inconel und Incoloy?
- Was ist der Unterschied zwischen Blech, Platte und Folie?
- Unterschied zwischen Struktur und Klasse:Erklärt mit C++-Beispiel
- Unterschied zwischen while und do-while:An Beispielen erklärt
- Abstimmung der Oberflächenchemie von Polyetheretherketon durch Goldbeschichtung und Plasmabehandlung
- Die Wirkung von Kontakt-Nichtgleichgewichtsplasma auf die strukturellen und magnetischen Eigenschaften von Mn Х Fe3 − X О4 Spinellen
- Was ist Wärmebehandlung? - Verfahren und Methoden
- Was ist der Unterschied zwischen Metallherstellung und Metallschweißen?
- Was ist der Unterschied zwischen Metallherstellung und Schweißen?
- Der Unterschied zwischen Anlassen und Glühen



