Ein hochgenaues AlGaN/GaN-Reverse-Blocking-CRD (RB-CRD) mit Hybrid-Grabenkathode
Zusammenfassung
Eine AlGaN/GaN-Lateral-Sperrsperrstrom-Regulierungsdiode (RB-CRD) mit Graben-Schottky-Anode und Hybrid-Trench-Kathode wurde vorgeschlagen und experimentell auf einem Siliziumsubstrat demonstriert. Die in die Anode integrierte Schottky-Barriere-Diode (SBD) weist eine Einschaltspannung von 0,7 V und eine Sperrdurchbruchspannung von 260 V auf. Die Hybrid-Trench-Kathode wirkt als CRD, die mit der Anoden-SBD in Reihe geschaltet ist. Für den RB-CRD kann eine Kniespannung von 1,3 V und eine Durchlassspannung über 200 V erreicht werden. Der RB-CRD ist in der Lage, einen hervorragenden Dauerstrom in einem weiten Temperaturbereich von 25 bis 300 °C auszugeben. Darüber hinaus weist der Durchlassregulierungsstrom kleine negative Temperaturkoeffizienten von weniger als – 0,152%/ o . auf C.
Hintergrund
Halbleiter mit großer Bandlücke haben für die nächste Generation von Hochleistungs-, Hochfrequenz- und Hochtemperatur-Bauelementen erhebliche Aufmerksamkeit auf sich gezogen. GaN ist aufgrund seiner überlegenen Eigenschaften wie großer Bandlücke, hoher Elektronenmobilität und hohem kritischen elektrischen Feld einer der vielversprechendsten Halbleiter mit großer Bandlücke [1, 2, 3, 4, 5]. Darüber hinaus kann aufgrund der Kombination von spontaner Polarisation und piezoelektrischer Polarisation ein zweidimensionales Elektronengas hoher Dichte (2DEG) an der AlGaN/GaN-Heterogrenzfläche erreicht werden. Solche hervorragenden Eigenschaften ermöglichen es den Leistungsbauelementen auf AlGaN/GaN-Basis, mit einem niedrigen Einschaltwiderstand zu arbeiten, während eine hohe Durchbruchspannung aufrechterhalten wird. Die GaN-auf-Silizium-Plattform (GaN-auf-Si) [6,7,8] gilt aufgrund der Verfügbarkeit von Siliziumwafern mit großem Durchmesser und der Kompatibilität mit dem bereits ausgereiften CMOS-Fertigungsprozess. Bis heute wurde eine Vielzahl von Leistungsbauelementen [9,10,11,12,13,14,15,16] auf AlGaN/GaN-auf-Si demonstriert und einige davon sind kommerziell erhältlich. Gleichzeitig kann die Entwicklung von AlGaN/GaN-Geräten mit neuen Funktionen das Anwendungspotenzial von AlGaN/GaN-auf-Si erweitern, was für die Förderung der umfassenden Kommerzialisierung der AlGaN/GaN-Technologie von Vorteil ist.
Wie in Abb. 1a dargestellt, wurde in dieser Arbeit ein neuartiges Bauelement, das als rückwärts sperrende stromregulierende Diode (RB-CRD) bezeichnet wird, an AlGaN/GaN-auf-Si experimentell demonstriert. Das RB-CRD verfügt über eine Trench-Schottky-Anode und eine Hybrid-Trench-Kathode. An der Anode wird eine Trench-Schottky-Barriere-Diode (SBD) gebildet, während in der Hybrid-Trenchkathode eine CRD erreicht wird. Der RB-CRD kann als SBD in Reihenschaltung mit einem CRD betrachtet werden. Eine typische Anwendung des RB-CRD ist das Laden von Batterien, wie in Abb. 1b gezeigt. In der oben erwähnten Batterieladeschaltung wirkt der CRD als Konstantstromquelle, die einen konstanten Strom zum Laden der Batterie ausgibt [17,18,19] ungeachtet der Vorwärtsspannungsschwankung zwischen dem Eingang und der Batterie. Wenn die Eingangsspannung unter die Batteriespannung fällt, verhindert die in Sperrrichtung vorgespannte SBD im Stromkreis, dass sich die Batterie entlädt.
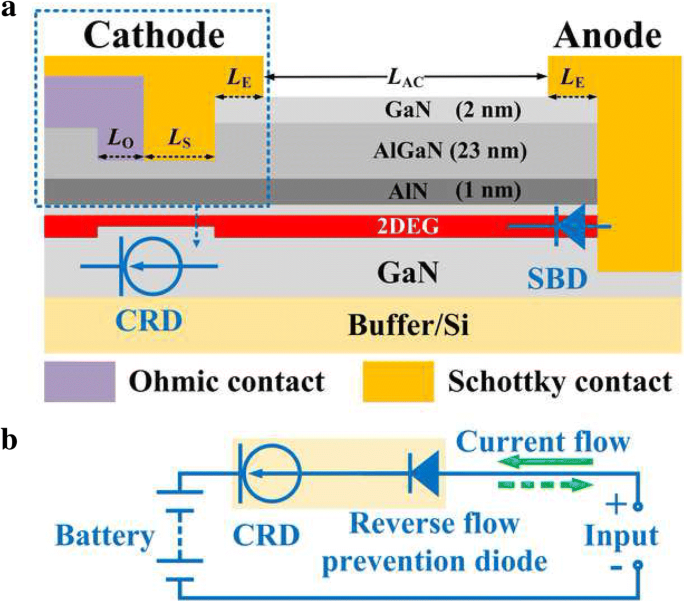
a Schematischer Querschnitt des RB-CRD. b Schaltplan Batterieladung mit dem RB-CRD
Methoden
Die zur Herstellung der RB-CRDs verwendete epitaktische AlGaN/GaN-Heterostruktur wurde auf einem 6-Zoll-(111)-Siliziumsubstrat durch metallorganische chemische Gasphasenabscheidung (MOCVD) aufgewachsen. Die Epitaxieschichten bestehen aus einer 2-nm-GaN-Kappe, einer 23-nm-AlGaN-Barriere, einer 1-nm-AlN-Zwischenschicht, einem 300-nm-GaN-Kanal und einem 3,5-μm-Puffer. Die gemessene Hall-Effekt-Dichte und -Mobilität des 2DEG betrug 9,5 × 10 12 cm −2 und 1500 cm 2 /V·s, bzw. Der Herstellungsprozess der Vorrichtung ist in Fig. 2 gezeigt. Zuerst wurde ein flacher Graben (siehe Fig. 3) in die Kathode des RB-CRD mit einem Cl2 . mit niedriger Leistung geätzt /BCl3 -basierte Ätztechnik mit induktiv gekoppeltem Plasma (ICP). Eine Ätzrate von 7 nm/min wurde unter Verwendung der entwickelten Ätzrezeptur mit einer HF-Leistung von 20 W, einer ICP-Leistung von 60 W, einem Cl2 . beobachtet Durchfluss von 5 sccm und ein BCl3 Durchfluss von 10 sccm. Dann wurde eine Mesa-Isolation mit einer Tiefe von 300 nm gebildet, indem dieselbe ICP-Ätztechnik verwendet wurde, um die Bauelemente zu trennen. Der Anodengraben wurde durch dieses Verfahren gleichzeitig hergestellt. Danach wurden die Metallstapel aus Ti/Al/Ni/Au (20/150/55/60 nm nm) durch Elektronenstrahlverdampfung abgeschieden, gefolgt von einem schnellen thermischen Glühen bei 880 °C für 35 s in N 2 Umgebungs. Der ohmsche Kontaktwiderstand von 1,1 Ω mm und der Schichtwiderstand von 400 Ω/Quadrat wurden nach der Übertragungsleitungsmethode extrahiert. Schließlich endete der Herstellungsprozess des Bauelements mit der Abscheidung des Ni/Au (50/300 nm) Schottky-Metallstapels. Der Abstand zwischen Anode und Kathode (L AC ) beträgt 4 µm. Die Längen des ohmschen Kontakts (L O ) und der Schottky-Kontakt (L S ) im Kathodengraben betragen 0,5 µm bzw. 1 µm. Der verlängerte Überhang (L E ) des Schottky-Kontakts beträgt 0,5 μm.
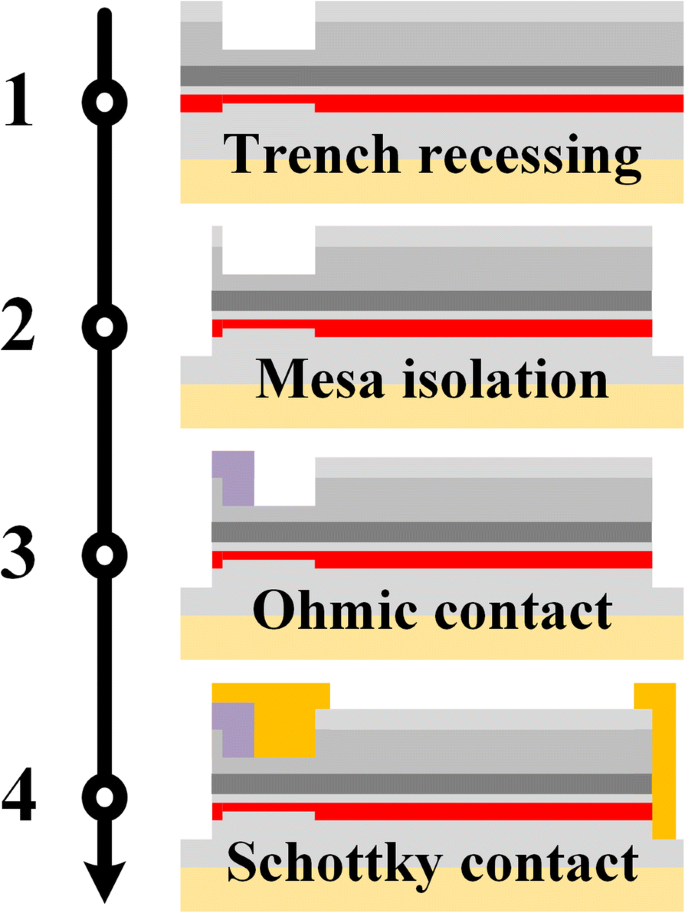
Herstellungsprozessablauf des RB-CRD
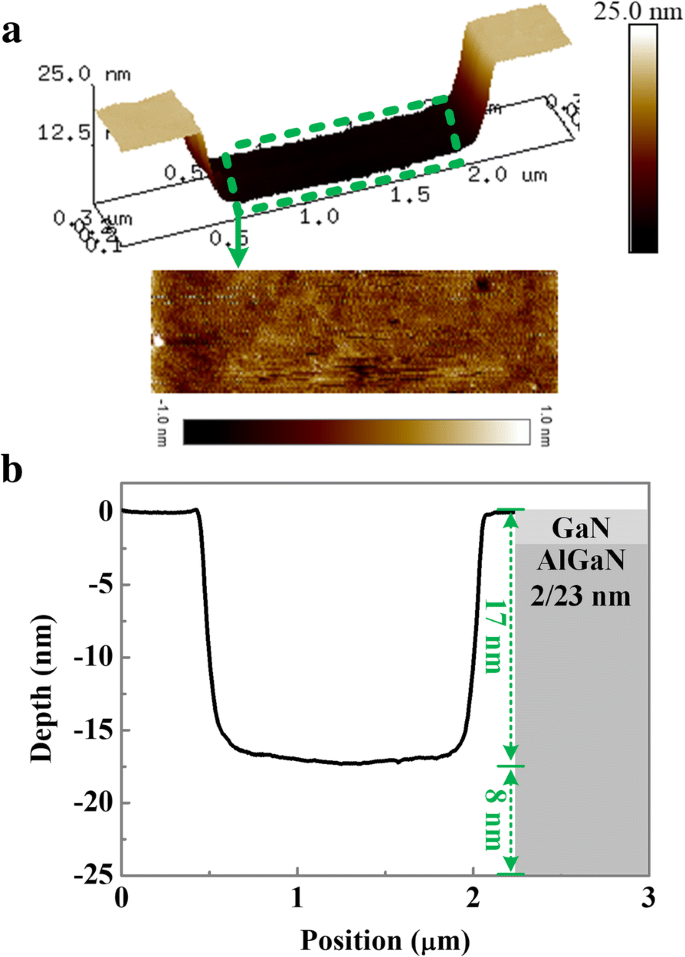
a AFM-Bilder des Kathodengrabens. b Höhenprofil aus dem Kathodengraben
Ergebnisse und Diskussion
Abbildung 3a zeigt das 3D-Atomkraftmikroskop (AFM)-Bild des hergestellten Kathodengrabens. Die Oberflächenrauhigkeit des Bodens des Kathodengrabens beträgt 0,3 nm. Eine derart geringe Oberflächenrauhigkeit ist für den folgenden Metall-Halbleiter-Kontakt günstig. Wie in Fig. 3b gezeigt, verbleibt die 8-nm-AlGaN-Barriereschicht bei einer Kathodengrabenvertiefung mit einer Tiefe von 17 nm im Kathodengrabenbereich. Eine solche verbleibende AlGaN-Barriereschicht ermöglicht, dass der 2DEG-Kanal im Kathodengrabenbereich immer bei Nullvorspannung existiert
Abbildung 4 veranschaulicht den Betriebsmechanismus des RB-CRD. Wenn eine Nullvorspannung an die Anode angelegt wird (V AC = 0 V) (siehe Fig. 4a), ist der RB-CRD analog zu einem Schottky-Drain-HEMT vom Verarmungsmodus, wobei die Gate-Source-Elektroden verbunden sind. Wenn eine negative Vorspannung an die Anode angelegt wird (V AC < 0 V) (siehe Fig. 4b) sammeln sich die Elektronen im Kathodengrabenbereich an, während der 2DEG-Kanal im Anodenbereich aufgrund des in Sperrrichtung vorgespannten Schottky-Übergangs verarmt wird. Zwischen der Anode und der Kathode folgt kein gewünschter Strom, und der RB-CRD wirkt als in Sperrichtung vorgespannte SBD. Wie in Abb. 4c gezeigt, wenn eine positive Vorspannung, die über der Einschaltspannung liegt (V T , bei 1 mA/mm) der Anode wird SBD an die Anode angelegt (V AC> V T ) fließen die Elektronen zwischen dem ohmschen Kontakt in der Kathode und dem Schottky-Kontakt in der Anode. Währenddessen wird der Schottky-Übergang in der Kathode in Sperrrichtung vorgespannt und der 2DEG-Kanal unter dem Schottky-Kontakt wird mit zunehmender Vorwärtsspannung allmählich erschöpft. Daher steigt der Ausgangsstrom zunächst mit der angelegten Anodenspannung und erreicht dann allmählich die Sättigung. In diesem Fall kann ein konstanter Ausgangsstrom erzielt werden.
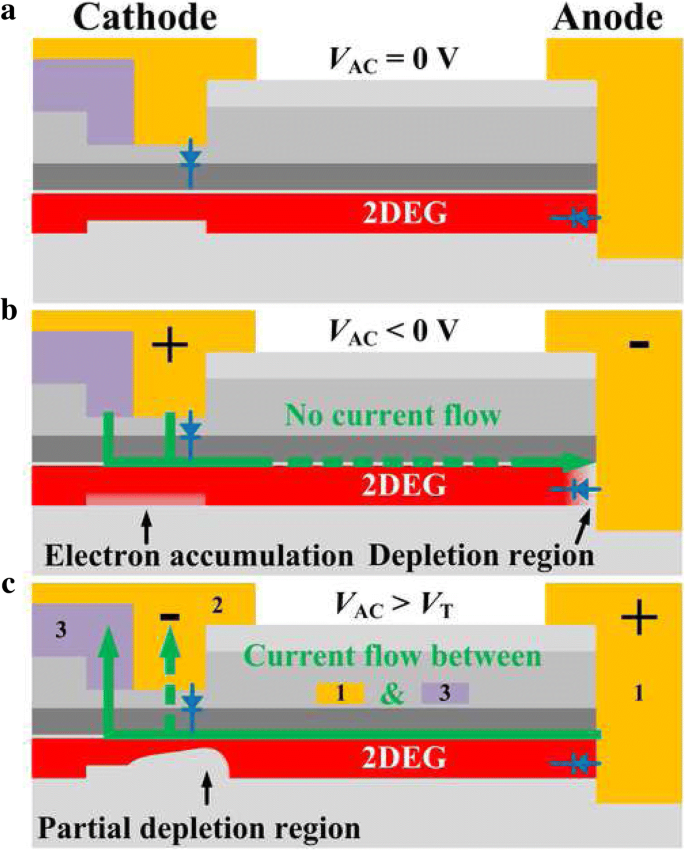
Schematischer Wirkungsmechanismus des RB-CRD unter a null Verzerrung, b umgekehrte Vorspannung und c Bedingungen für die Vorwärtsspannung
Der temperaturabhängige Vorlauf I-V Charakteristiken der RB-CRD auf dem Wafer sind in Fig. 5 gezeigt. Wie in Fig. 5a gezeigt, ist für die RB-CRD eine Kniespannung (V K , bei 80 % des konstanten Regelstroms) von 1,3 V erhalten, was höher ist als bei unseren zuvor berichteten CRDs (z. B. typischer Wert 0,6 V) [20, 21]. Dies ist auf den zusätzlichen Spannungsabfall (z. B. typischer Wert 0,7 V) an der Anode SBD des RB-CRD zurückzuführen. Mit steigender Temperatur von 25 auf 300 °C (siehe Abb. 5a), eine negative Verschiebung des V T beobachtet, was durch das thermionische Emissionsmodell erklärt werden kann (d. h. weniger Energie wird für Elektronen benötigt, um die Schottky-Barriere bei höheren Temperaturen zu überwinden). Der RB-CRD ist in der Lage, einen konstanten Regelstrom von bis zu 200 V auszugeben (siehe Abb. 5b), der höher ist als die angegebene maximale Betriebsspannung der kommerziellen CRDs auf Si-Basis [22,23,24]. Bei 25°C ist das Regelstromverhältnis (I 200 V /Ich 25 V ) des vorgeschlagenen RB-CRD beträgt 0,998, was darauf hindeutet, dass der Ausgangsstrom ziemlich konstant ist. Dank der intrinsischen Hochtemperatur-Betriebsfähigkeit der AlGaN/GaN-Plattform zeigt das RB-CRD eine vernachlässigbare Verschlechterung der Stabilität des I A bis zu 200 V bei Temperaturen von bis zu 300 C. Während die Temperatur von 25 auf 300°C ansteigt, wird das Vorwärts I A verringert sich von 31,1 auf 23,1 mA/mm aufgrund der verringerten Elektronenmobilität bei erhöhten Temperaturen, wie in Abb. 5b gezeigt. Die Temperaturkoeffizienten (α ) des Regelstroms bei verschiedenen Temperaturbereichen kann nach folgender Formel berechnet werden
$$ \alpha =\frac{I_1-{I}_0}{I_0\left({T}_1-{T}_0\right)}\mal 100\% $$wo ich 0 ist der Ausgangsstrom bei Temperatur T 0 und ich 1 ist der Ausgangsstrom bei Temperatur T 1 . Ein kleiner Temperaturkoeffizient von weniger als − 0,152%/ o C wird beobachtet, was darauf hinweist, dass das hergestellte RB-CRD eine ausgezeichnete thermische Stabilität aufweist.

Temperaturabhängige Vorwärtsspannung I -V Eigenschaften des RB-CRD. Anodenspannungsbereiche:a 0–2 V, b 0–200 V
Wie im Einschub von Fig. 6 gezeigt, beträgt die Rückwärtsdurchbruchspannung des RB-CRD 260 V bei 25 °C. Das entsprechende durchschnittliche kritische elektrische Feld wird mit 0,65 MV/cm berechnet. Die temperaturabhängige Umkehrung I-V Die Kennlinien des RB-CRD sind in Abb. 6 dargestellt. Der Anstieg der Umgebungstemperatur von 25 auf 300°C führt zu einem Anstieg des Leckstroms um zwei Größenordnungen.

Temperaturabhängige Sperrspannung I -V Eigenschaften des RB-CRD
Schlussfolgerungen
Zusammenfassend wurde erstmals ein neuartiges AlGaN/GaN-auf-Si RB-CRD mit Trench-Schottky-Anode und Hybrid-Trench-Kathode erfolgreich demonstriert. Das hergestellte RB-CRD zeigt ein V K von 1,3 V, eine Vorwärtsbetriebsspannung von über 200 V und eine Rückwärtsdurchbruchspannung von 260 V. Eine ausgezeichnete Genauigkeit sowie ein kleiner negativer Temperaturkoeffizient von weniger als − 0,152%/ o C wurden für das RB-CRD erhalten. Das multifunktionale RB-CRD mit hoher Genauigkeit hat großes Potenzial, in neue GaN-Leistungselektroniksysteme integriert zu werden.
Abkürzungen
- 2DEG:
-
Zweidimensionales Elektronengas
- AFM:
-
Rasterkraftmikroskop
- ICP:
-
Induktiv gekoppeltes Plasma
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- RB-CRD:
-
Sperrdiode zum Sperren des Stroms
- SBD:
-
Schottky-Diode
Nanomaterialien
- Erstellen hybrider Blockchain-/Cloud-Anwendungen mit Ethereum und Google
- Verbesserung der additiven Fertigung durch Reverse Engineering
- Infineon:rückwärtsleitender IGBT mit Schutzfunktionen
- Python-Arrays:Beispiele für Python-Arrays erstellen, umkehren, einfügen
- Einfluss von Oberflächenzuständen und Aluminium-Molekülfraktion auf das Oberflächenpotential und 2DEG in AlGaN/GaN-HEMTs
- Mehrfarbige Emission von ultravioletter GaN-basierter photonischer Quasikristall-Nanopyramidenstruktur mit semipolaren InxGa1−xN/GaN-Mehrfachquantenquellen
- Die elektrischen Eigenschaften von Hybridverbundwerkstoffen basierend auf mehrwandigen Kohlenstoffnanoröhren mit Graphit-Nanoplättchen
- Synthese und elektrochemische Eigenschaften von LiNi0.5Mn1.5O4 Kathodenmaterialien mit Cr3+ und F− Verbunddotierung für Lithium-Ionen-Batterien
- Hochleitfähige PEDOT:PSS transparente Lochtransportschicht mit Lösungsmittelbehandlung für Hochleistungs-Silizium/organische Hybridsolarzellen
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie



