RTN und Annealing in Bezug auf Spannung und Temperatur in FIND RRAM Array
Zusammenfassung
In dieser Arbeit wird eine Beobachtung des zufälligen Telegraphenrauschsignals (RTN) im Lesestrom eines dielektrischen FinFET-RRAM (FIND RRAM)-Bauelements präsentiert. Es wird festgestellt, dass sich das RTN-Signal einer FIND-RRAM-Zelle ändert, nachdem die Vorrichtung einer zyklischen Belastung ausgesetzt wurde. Nach zyklischem Stress neigen RRAM-Zellen stärker dazu, häufigere und intensivere RTN-Signale zu zeigen. Der Anstieg des Rauschpegels in FIND-RRAM-Zellen kann im Allgemeinen durch Hochtemperatur-Ausheilung gemindert werden, und mit diesem Konzept wird ein Ausheilschema auf dem Chip vorgeschlagen und demonstriert.
Einführung
Die kontinuierliche Skalierung der CMOS-Technologie hat die Eigenschaften und die Leistung integrierter Schaltungen in den letzten zehn Jahren drastisch verbessert. Wenn der Technologieknoten jedoch unter 20 nm verkleinert wird, nehmen Variationen aufgrund einzelner Atome/Elektronen in den Geräteeigenschaften zu, z. Variationen in der Anzahl von Ladungsträgern oder strukturelle Defekte haben beispielsweise einen viel größeren Einfluss auf die Ausgabe und Leistung in einem skalierten Gerät, und die Auswirkungen der Geräteskalierung auf die Variabilität aufgrund von RDF und Gate Line-Rand-Rauheit (LER) haben ebenfalls berichtet worden [2,3,4]. Zufälliges Telegraphenrauschen (RTN) gilt als eine weitere große Herausforderung für Geräte mit kleiner Fläche, wie NAND-Flash und RRAMs [5,6,7,8,9,10,11]. In dieser Arbeit untersuchen wir das RTN-Rauschen in einer n-Kanal-FinFET-basierten FIND-RRAM-Zelle, die bereits erfolgreich in Standardlogikprozessen in 1kbit-Arrays implementiert wurde [12]. Veränderungen der RTN als Reaktion auf zyklische Belastungen und Hochtemperatur-Ausbacken werden beobachtet. In dieser Arbeit werden die Auswirkungen von Stress und Temperatur auf das RTN-Rauschen in FIND-RRAM-Zellen untersucht und ein On-Chip-Annealing-Schema vorgeschlagen, um das zeitvariante Lesestromrauschen nach dem Zyklus zu mildern.
Hintergrund und Methoden
Ein FIND-RRAM besteht aus zwei FinFET-Transistoren. Einer wirkt als WL-Auswahltransistor in Reihe mit dem RRAM-Knoten. Das High-k-Gate-Dielektrikum zwischen dem SiP und dem SL des anderen Transistors dient als Speicherknoten, wie in Fig. 1a gezeigt. Die FIND-Bauelemente bestehen aus dem Gatedielektrikumsfilm in Standard-FinFETs, wobei die Gateelektrode W für die obere Elektrode und TaN für die untere ist. Das Gate-Stack-Oxid besteht aus HfO2 /SiO2 /TiN-Stapelschichten [12]. Der Lesezustand einer FIND-RRAM-Zelle ist in Fig. 1b veranschaulicht, wobei WL 0,8 V zum Einschalten des Auswahltransistors gegeben wird, während 0,8 V zu SL hinzugefügt werden, um einen ausreichenden Lesestrom zum Auslesen von Daten zu treiben. Ein ohmsches Umschalten zwischen einem hochohmigen Zustand (HRS) und einem niederohmigen Zustand (LRS) wird erreicht, indem ein Set/Reset an der FIND-RRAM-Zelle durchgeführt wird [13]. Ein FIND-RRAM zeigt ziemlich stabile Widerstandsschalteigenschaften unter DC-Sweeps, siehe Fig. 2a, während seine Zeit-bis-Set- und Zeit-bis-Reset-Eigenschaften in Fig. 2b zusammengefasst sind. Die in Abb. 2a aufgeführten Betriebsbedingungen zeigen, dass Niederspannungsbetrieb möglich ist. Die Zellen durchlaufen sowohl beim Setzen als auch beim Zurücksetzen mehrere Pulszyklen, um die angestrebten Lesestrompegel zu erreichen. Die Impulsbreite erhöht sich, wenn das Gerät nach dem Anlegen mehrerer Impulse nicht eingestellt oder zurückgesetzt wird, wie in Abb. 3a dargestellt. Ein charakteristisches RTN-Signal kann sowohl in LRS- als auch in HRS-FIND-RRAM-Zellen gefunden werden, wie in Fig. 3b gezeigt. RTN-Signale, die durch Charge Trapping und Detrapping im Stromleitpfad verursacht werden, können zu erheblichen Stromschwankungen führen [14,15,16,17].
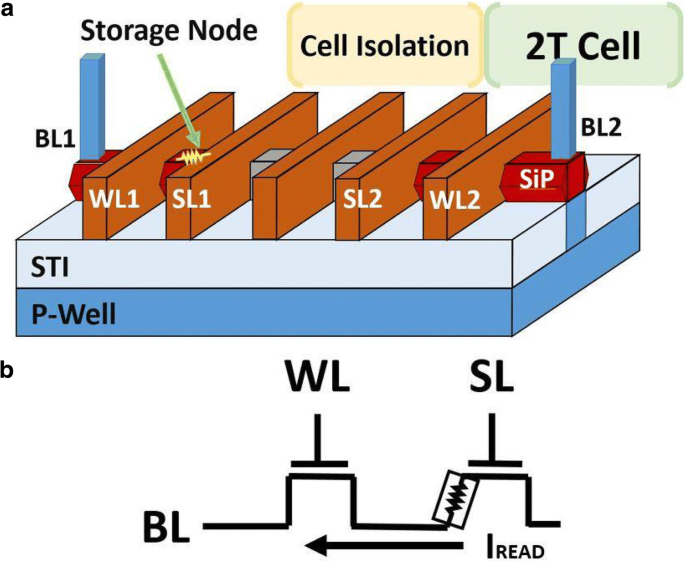
a 3D-Darstellung der 2 T FIND RRAM-Zellen, implementiert durch CMOS-FinFET-Technologien und b der Schaltplan einer Einheitszelle für FIND RRAM unter Lesebedingung ist gezeigt, wobei VSL =VWL =0,8 V und BL auf Null vorgespannt ist
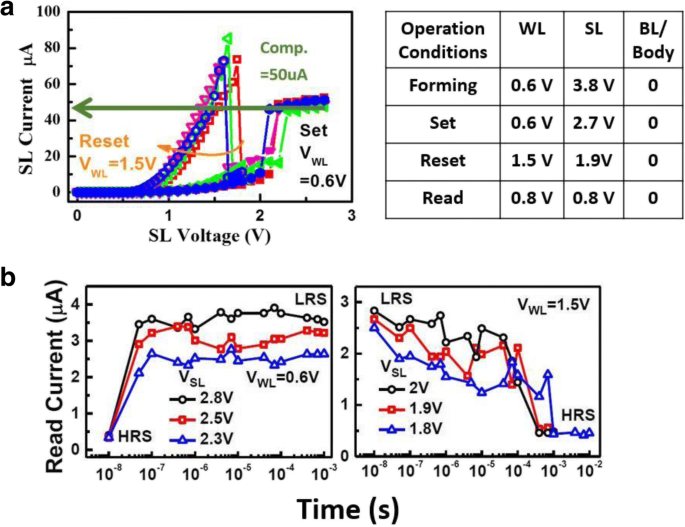
Die DC-resistiven Schaltfunktionen des FIND RRAM und seine Betriebsbedingungen sind in (a ). Die Eigenschaften der Zeit bis zum Einstellen und der Zeit bis zum Zurücksetzen sind in (b )

a Illustration der zunehmenden Pulsbreite, die verwendet wird, um einen Set/Reset-Vorgang durchzuführen. Nach dem ersten Impuls von 1 μs wird ein Lesevorgang durchgeführt, um zu bewerten, ob der Lesestrom die Zielwerte von 3 μA für LRS und weniger als 1 μA für HRS erreicht. Wird der geforderte Zustand nicht erreicht, wird der nächste Impuls gegeben. Die Pulsbreite wird alle zehn Pulse um eine Ordnung verlängert. b Vergleich des Lesestroms bei Raumtemperatur, abgetastet bei VSL =VWL =0,8 V und VBL =0, mit einer Abtastrate von 500 Hz, vor und nach 100 Zyklen
Es ist allgemein bekannt, dass wiederholtes Zyklen, d. h. das Umschalten zwischen den beiden Zuständen, Spannungen auf den FinFET mit der dielektrischen Gate-Schicht induzieren kann [18]. Die belastete Übergangsmetalloxidschicht (TMO) in den FIND-RRAM-Zellen neigt stärker dazu, RTN-Rauschen zu zeigen, was zu einem zeitvarianten Lesestrom führt, der Lesefehler und Stabilitätsprobleme beim Datenauslesen verursachen kann. In diesem Experiment haben wir die Leseströme des Arrays frisch, nach 10x Zyklen und nach 100x Zyklen abgetastet, um den Stresseffekt auf RTN im FIND RRAM zu beobachten.
Um den Temperatureffekt auf gestresste FIND-RRAM-Zellen zu untersuchen, werden Proben mit unterschiedlichen RTN-Signalen in LRS zuerst auf 0 °C abgekühlt und dann allmählich auf 50 °C erhitzt. Während dieses Vorgangs werden Leseströme bei diesen Temperaturen 20 s lang kontinuierlich mit einer Rate von 500 Hz abgetastet. Dies gibt uns einen Hinweis darauf, wie sich RTN bei Temperaturänderungen verhält.
Ergebnisse und Diskussion
Durch umfangreiche Messungen wurde festgestellt, dass RTN in einer FIND-RRAM-Zelle an ihrem LRS stabiler und leichter beobachtbar ist. Daher konzentriert sich der folgende Abschnitt bei der Untersuchung des Zyklen- und Annealing-Effekts auf RTN von FIND-RRAM-Zellen auf die Untersuchung von Zellen bei LRS. Wie in Fig. 4a gezeigt, führen RTN-Rauschen zu einem zeitvarianten Lesestrom, der einen Lesefehler verursacht. Dieser Effekt ist im 1-kbit-Zellen-Array zu beobachten. In einem Array, das 10 Zyklen durchlaufen hat, werden beim Abtasten des Lesestroms während eines 20-sekündigen Intervalls erhebliche Lesestromschwankungen festgestellt. Die normalisierte Bitstromabbildung in einem Array ist in Abb. 4b angeordnet, wobei die Stromfluktuationen im LRS bis zu + 5% betragen können, was vergleichbar mit dem RTN ist, der beim Gate-Leckstrom nach Belastung beobachtet wurde [19]. Um die Wirkung von Stress zu untersuchen, verfolgten wir die aktuellen Fluktuationsniveaus von 50 Zellen vor und nach zyklischem Stress. Die Daten in Abb. 5a zeigen, dass mehr als 90 % der Zellen nach dem Zyklen einen Anstieg von ΔI/I aufweisen. Es zeigt sich nämlich, dass das zeitvariante Rauschen im FIND-RRAM allmählich verschlechtert wird, wenn die Zellen mehr zyklischen Belastungen ausgesetzt sind. Wenn wir die normalisierte Lesestromverteilung frischer Zellen und zyklischer Zellen vergleichen, wird festgestellt, dass Zellen, die mehr Zyklen durchlaufen haben, signifikantere RTN-Signale aufweisen und zwei oder mehr Spitzenstromverteilungen in bestimmten Zuständen aufweisen. Andererseits haben frische Zellen eine Stromverteilung einer Standardverteilung, was darauf hinweist, dass kein RTN-Rauschen an der Fluktuation beteiligt ist, wie in Abb. 5b gezeigt [20, 21]. Dies deutet darauf hin, dass, sobald ein FIND-RRAM einer langen zyklischen Belastung ausgesetzt ist, sein Bitzellenstrom aufgrund des Hinzufügens von RTN drastischeren Schwankungen unterliegen kann.

a Ein normalisierter Lesestrom bei 25 °C, abgetastet mit einer Rate von 500 Hz in einer RRAM-Zelle, die 10 Zyklen durchlaufen hat. Dies zeigt, dass RTN einen zeitvarianten Lesestrom verursacht. b Zeigt das Diagramm des normalisierten Stroms in einem 1-kbit-Array, das 10 Zyklen durchlaufen hat, gleichzeitig abgetastet bei t1 = 3, t2 = 7,5, t3 = 14 und t4 = 17,5 s nacheinander. Durch den Vergleich des Snapshots zu unterschiedlichen Zeitpunkten schwankt der Lesestrom unter den gleichen Lesebedingungen

a Vergleich der Verteilung der |ΔI/I| von 50 Proben vor und nach Belastung. Es ist ersichtlich, dass Zellen nach Stress insgesamt ein größeres ΔI/I aufweisen. Die Perzentilwerte des Boxplots von unten nach oben repräsentieren die 25, 50 bzw. 75 Perzentilpunkte, während die Whiskers die maximalen und minimalen Werte anzeigen. b Ein Histogramm der normalisierten Lesestromverteilung einer Zelle, gemessen im frischen Zustand und nach 10 und 100 Zyklen. Dies zeigt, dass, sobald ein FIND-RRAM einer langen zyklischen Belastung ausgesetzt ist, sein Bitzellenstrom aufgrund des Hinzufügens von RTN drastischeren Schwankungen unterliegen kann.
Die normalisierten Ergebnisse der Lesestromprobe bei verschiedenen Temperaturstufen werden in Abb. 6 verglichen. Die Einfangzeit und die Emissionszeit von RTN-Fallen wurden untersucht und ändern sich bekanntermaßen mit der Temperatur, die beide mit steigender Temperatur abnehmen [22, 23 ]. Erwartungsgemäß steigt die Frequenz des RTN-Rauschens mit steigender Temperatur, nämlich dass die Schwankungen des Lesestroms bei 0 °C seltener auftreten als bei 25 °C. Bei einer Messung bei 50 °C treten jedoch Stromschwankungen zwischen zwei Zuständen weniger auf. Dies kann in Abb. 7a weiter gezeigt werden, die das Histogramm der normalisierten Leseströme zeigt, die bei 0 °C, 50 °C und Raumtemperatur gemessen wurden. Die Stromverteilungen von 0 °C und 25 °C haben zwei Verteilungsspitzen, was darauf hindeutet, dass einzelne Einfangzustände RTN den Leiterpfad dominieren [19], während die diskreten Zustände des abgetasteten Stroms bei 50 °C weniger auffallen. Dies deutet darauf hin, dass die Fallen, die das RTN-Signal verursachen, bei höheren Temperaturen einer Instabilität unterliegen könnten, wie z 
Ein Vergleich der normalisierten Leseströme einer RRAM-Zelle (im LRS-Zustand), die 100 Zyklen mit RTN-Rauschen, gemessen bei 0, 25 und 50 °C, bei einer Abtastrate von 500 Hz durchlaufen hat

a Ein Vergleich von Histogrammen der normalisierten Lesestromverteilung einer Zelle im LRS-Zustand, gemessen bei 0, 25 und 50 °C. b Ein Vergleich der kumulativen Wahrscheinlichkeit der |ΔI/I| von 30 Proben vor Belastung, nach Belastung bzw. nach dem Tempern. Es wurde festgestellt, dass ein großer Teil der Zellen nach dem Annealing-Prozess zu seinem ursprünglichen ΔI/I zurückkehrt
In weiteren Untersuchungen werden die Proben auf 75 °C erhitzt. Diese Zellen kühlten nach 30 Minuten auf Raumtemperatur ab, dann werden die Proben entnommen. Dreißig Zellen werden ausgewählt und ihre kumulativen Stromfluktuationsniveaus im frischen Zustand, unter Spannung und nach dem Tempern werden in Fig. 7b verglichen. Dies zeigt, dass die meisten Zellen nach dem Annealing-Prozess zu ihrem ursprünglichen I/I zurückkehren. Die normalisierten Leseströme von einer Zelle in ihrem frischen Zustand, im belasteten Zustand und nach dem Backen sind in Fig. 8 verglichen. Der Strom nach dem Backen ähnelt dem, der frisch ist, was darauf hindeutet, dass das Hochtemperaturbacken die Fallen ausheilt, die RTN-Signale verursachen. Abbildung 9a ist eine geordnete grafische Darstellung des normalisierten Lesestroms für 1 kbit-Array von frischen Zellen, leicht gestressten Zellen, stark gestressten Zellen bzw. nach dem Ausheizen. Aus dem Diagramm wird gezeigt, dass Stromschwankungen intensiver werden, wenn der RRAM stark belastet wird, und nach dem Hochtemperaturbacken drastisch reduziert werden. Dieser Effekt kann im gesamten Array beobachtet werden, was bestätigt, dass das Hochtemperaturbacken tatsächlich einen Annealing-Effekt auf die Traps ausübt, die RTN-Rauschen induzieren [24,25,26,27,28,29]. Fig. 9b vergleicht weiter die ΔI/I-Verteilungen in einem Zellenarray, die durch zehn verschiedene sequentielle Abtastungen erhalten wurden. Es hat sich herausgestellt, dass das gleiche Array unterschiedliche ΔI/I-Verteilungen im frischen Zustand, im Stresszustand und im nachgeglühten Zustand aufweist. Daten deuteten darauf hin, dass das Tempern dem Zellenarray hilft, reduzierte Stromschwankungen zu zeigen, ähnlich dem Niveau eines Arrays in seinem frischen Zustand. Dieses Ergebnis kann verwendet werden, um die Lebensdauer von FIND RRAM-Zellen zu korrigieren und zu verlängern, die nach zyklischer Belastung RTN-Signale gezeigt haben.

Lesen Sie die Ströme frischer und belasteter Zellen, die bei 25 °C, 500 Hz abgetastet wurden, im Vergleich zu denen der Zelle nach dem Hochtemperaturbacken und Abkühlen in einem Zeitraum von 30 Minuten auf Raumtemperatur. Es zeigt, dass nach dem Backen der Stress abgebaut wird und sich die Zelle wie eine frische verhält

a Normalisierte Leseströme eines 1-kbit-Arrays, die zu einem bestimmten Zeitpunkt aufgenommen wurden, aufgetragen bei frisch, leicht belastet, stark belastet und nach dem Tempern. Es ist zu sehen, dass die Anzahl der Zellen mit starker Fluktuation über das Array hinweg stark zunimmt, wenn das Array mehr Stress erfährt und nach dem Tempern absinkt. b Vergleich der kumulativen Wahrscheinlichkeiten der |ΔI/I| Verteilungen von 50 Proben desselben Arrays im frischen, belasteten und nach dem Tempern zu verschiedenen Zeitpunkten im 1-s-Intervall. Der Gesamt-ΔI/I der Proben nach Belastung ist höher und kehrt nach dem Tempern auf den Normalwert zurück
Es ist erwähnenswert, dass einige Zellen, die während der Zyklen in einem mittleren Zustand steckengeblieben sind, nach einer Hochtemperaturbehandlung wiederbelebt werden. Wenn eine FinFET-RRAM-Zelle LRS und HRS durchläuft, kann der leitfähige Faden in einigen Zellen einen Kanal bilden, der nicht einfach zurückgesetzt werden kann. Der Bake-Prozess bietet diesen Zellen den Weg, um ihre Sauerstoffleerstellen neu zu verteilen, was folglich eine effektive Rücksetzung auf HRS ermöglicht [30]. Abbildung 10 zeigt eine Zelle, die nicht in der Lage war, auf HRS umzuschalten, die nach 125 °C, 15 Minuten Backen wiederbelebt wurde. Vor diesem Hintergrund wird ein Ausheilmechanismus auf dem Chip vorgeschlagen, der ein lokales Erwärmen der FIND-RRAM-Zelle beinhaltet. Ein konstanter Strom von 1,5 mA mit einer Dauer von 10 s wird an die Zelle durch Durchlassvorspannung am Drain-Übergang des ausgewählten FinFET angelegt, wie in Fig. 11a veranschaulicht. Dieser große Strom heizt einen begrenzten Bereich in der Nähe des RRAM-TMO auf und liefert einen ähnlichen Glüheffekt. Der Lesestrom vor und nach dem Tempern des Prüflings (DUT) wird gemessen und in Abb. 11b analysiert. Die kumulativen Verteilungen des kontinuierlich abgetasteten Lesestroms demonstrieren die Entfernung von RTN auf einer Zelle nach dem Ausheilschritt auf dem Chip. Hier wurde das On-Chip-Annealing des FIND-RRAMs an einzelnen Zellen in aufeinanderfolgenden Schritten durchgeführt, um die nominelle Reaktion auf eine typische RRAM-Zelle nach Belastung zu verstehen. Für ein Experiment auf Array-Ebene muss ein neues Temperverfahren auf dem Chip entwickelt werden.

Indem wir auf Zellen, die im mittleren Zustand steckengeblieben sind, ein Backen bei 125 °C anwenden und einen Annealing-Prozess bereitstellen, überführen wir diese Zellen wieder in den funktionsfähigen Zustand und verlängern so die Zelllebensdauer

Das von uns vorgeschlagene On-Chip-Annealing-Schema beinhaltet das Anlegen von − 1 V bei BL, die eine Vorwärtsspannung ergibt, und einen gemessenen Strom von 1,5 mA, der die belastete Zelle aufheizt und ausheilt. Im Diagramm können wir durch Vergleich des kumulativen Prozentsatzes des normalisierten Stroms der Zelle vor und nach dem Prozess sehen, dass die durch RTN verursachte Stromschwankung stark reduziert wird
Schlussfolgerung
In diesem Papier wird der Stress- und Temperatureffekt auf RTN in einem FIND RRAM-Zellenarray diskutiert. Es wird ein durch Radfahren stressinduzierter RTN-Anstieg beobachtet. Die Wirkung einer Hochtemperaturbehandlung auf die Reduzierung von RTN und die Linderung von Stress für TMO in einem FIND-RRAM wird beobachtet. Schließlich wird ein On-Chip-Annealing-Schema vorgeschlagen und demonstriert.
Abkürzungen
- RRAM FINDEN:
-
Fin-Feldeffekttransistor dielektrischer resistiver Direktzugriffsspeicher
- HRS:
-
Hochohmiger Zustand
- LER:
-
Linien-Rand-Rauheit
- LRS:
-
Niedriger Widerstandszustand
- RTN:
-
Zufälliges Telegrafenrauschen
- TMO:
-
Übergangsmetalloxid
Nanomaterialien
- [Erklärt] Was ist Asset-Tracking und verwandte Fragen
- Zutrittskontrolle mit QR, RFID und Temperaturüberprüfung
- Python- und Raspberry Pi-Temperatursensor
- Einfache Temperatur und Luftfeuchtigkeit auf Raspberry Pi
- DIY:Temperaturüberwachung und -regulierung für HomeBrew
- Raspberry Pi Temperatur- und Lichtsensor
- Materialien:Tipps zum Glühen für amorphe Polymere, Teil 2
- Messung der Temperatur in Verbundwerkstoffen und Bondlines
- Was ist Glühen? - Definition, Prozess und Phasen
- Lab-On-Chip-Durchfluss- und Temperatursensor



