Lichteinfang-induzierte hohe Kurzschlussstromdichte in III-Nitrid-Nanostäbchen/Si (111)-Heterojunction-Solarzellen
Zusammenfassung
Für die epitaktisch aufgewachsenen p-GaN/i-InGaN/n-GaN-Diodenarrays wurde ein photovoltaischer Wirkungsgrad von 1,27% bei der Leistungsumwandlung ohne Gittermetallkontaktfläche und unter 1 Sonne, AM 1,5G-Bedingungen erhalten (111)-Si. Die Kurzschlussstromdichte beträgt 14,96 mA/cm 2 und die Leerlaufspannung beträgt 0,28 V. Es wird angenommen, dass ein verstärkter Lichteinfang über Mehrfachreflexionen innerhalb der verformungs- und fehlerfreien III-Nitrid-Nanostab-Array-Strukturen und die Kurzwellenreaktionen, die durch die III-Nitrid-Bestandteile mit großer Bandlücke verstärkt werden, zum . beitragen beobachtete Verbesserungen der Geräteleistung.
Einführung
Die Entwicklung grüner Energie wird immer wichtiger und die Industrie für Leuchtdioden (LED) sowie Solarzellen hat sich aufgrund einer ständig zunehmenden Energiekrise in hohem Tempo entwickelt. In den letzten Jahrzehnten wurden III-Nitrid-Halbleiter erfolgreich in LED-Bauelementen eingesetzt [1,2,3], was zu erheblichen kommerziellen Vorteilen führte. Derzeit versuchen viele Wissenschaftler, das Forschungspotenzial von III-Nitriden für photovoltaische Anwendungen zu nutzen [4, 5]. Nitridmaterialien der Gruppen III-V haben viele Vorteile für Photovoltaiksysteme, wie z. hohe Trägermobilität [7] und überlegene Strahlungsbeständigkeit [8]. Basierend auf diesen hervorragenden Eigenschaften werden verschiedene Gerätestrukturdesigns simuliert, wie InGaN/Si-Tandemzellen [9,10,11,12,13,14], Solarzellen mit heißen Ladungsträgern [15], Schottky-basierte Solarzellen [16, 17,18], einzelne [19,20,21,22,23,24] und mehrere [25, 26] Übergangssolarzellen sowie Polarisationseffekte auf die Solarzellenleistung [9, 23, 27]. Die Simulationen haben vorhergesagt, dass heterostrukturierte InGaN/Si-Tandemzellen Wirkungsgrade von bis zu 21–36 % haben könnten [10, 11, 13] basierend auf verschiedenen Simulationsmodellen. Die Leistungsumwandlungseffizienz (PCE) einer homostrukturellen InGaN-Tandemsolarzelle mit vier verschiedenen In-Zusammensetzungen wird mit 51 % unter 1-Sonnen-Bestrahlung und 58 % unter 250-Sonnen-konzentrierten Bedingungen vorgeschlagen [26]. Allerdings werden die Probleme der Verunreinigungen und der nicht-strahlenden Rekombination unter den Wachstumsbedingungen für InGaN-Dünnschichten bei niedrigen Temperaturen immer wichtiger [28,29,30]. Die signifikanten Stapelfehler und Versetzungsdichten aufgrund von Gitterfehlanpassungen führen zu einer Verringerung der Ladungsträgerdiffusionslänge und zur Einschränkung der PCE von Solarzellen [31,32,33,34]. Daher bleiben zahlreiche Herausforderungen für die Realisierung der potenziellen Fähigkeiten hocheffizienter III-Nitrid-Photovoltaikvorrichtungen.
In den letzten zehn Jahren wurden viele relevante Forschungsthemen wie InGaN-Kristallwachstumsmethoden auf freistehenden GaN-Substraten [34], InGaN-Dotierung vom p-Typ [35], Quantentopfdesigns [36,37,38,39,40], Elektroden Designs [41,42,43,44], Konzentrator-Photovoltaik [37, 41, 45], Intermediate-Band-Solarzellen [46] und reflexionsreduzierte Strukturen [47,48,49] wurden untersucht. Darüber hinaus wurden die unpolaren Nitrid-basierten Solarzellen auf den Polarisationseffekt untersucht [50, 51]. Dahalet al. demonstrierten einen InGaN-Mehrfachquantentopf-Solarzellenbetrieb von mehr als 30 % bei längeren Wellenlängen (> 420 nm) [38] und zeigten einen Wirkungsgrad von 3,03 % bei erhöhter Beleuchtungsintensität bis zu 30 Sonnen [37]. Mori et al. untersuchten Konzentrator-Nitrid-basierte Solarzellen [45] und adressierten den höchsten PCE von 4% bei einer hohen Lichtintensität von bis zu 300 Sonnen [41]. Obwohl mehrere Forschungsgruppen unterschiedliche strukturelle oder optische Designs lieferten und die Wachstumstechniken verbesserten, machte die PCE von III-Nitrid-Solarzellen keine großen Fortschritte. Andererseits haben Reichertz et al. zeigten, dass Tandemsolarzellen durch epitaktisches Aufwachsen von p-n-Übergangs-GaN auf p-n-Übergangs-Si-Substrat möglich sind [14]. Ihre Ergebnisse zeigten, dass das Si-Substrat zur langwelligen Effizienz beitrug, während Nitrid zur kurzwelligen Effizienz beitrug. Siliziumsubstrate bieten nicht nur eine kostengünstige Lösung, sondern auch eine PCE-Verbesserung und eine gute Wärmeleitfähigkeit [52].
Üblicherweise werden beim Solarzellenwachstum kontinuierliche Filmschichten übereinander gezüchtet, was zu einer hohen Versetzungsdichte führt. Wenn jedoch III-Nitride in Nanostrukturen gezüchtet werden, ist die Bodenfläche in Kontakt mit dem Substrat klein, wodurch die Versetzungen durch das Gewinde verringert werden und die Spannung ebenfalls minimal sein kann. Tessareket al. berichteten, dass die Versetzungen von GaN-Nanostäbchen bei einem Durchmesser von 200 nm verschwanden [53]. Daher wäre es als Alternative zum Filmwachstum auf Siliziumsubstraten eine bevorzugte Wahl, III-Nitrid-Nanostab-Solarzellen zu züchten, um die Kosten zu senken, die Kristallqualität zu verbessern und den Zellwirkungsgrad zu erhöhen. Außerdem haben Nanostäbchen/Nanodrähte eine große Kapazität für photovoltaische Anwendungen, da die photogenerierten Elektronen aufgrund eines direkten Pfads zu den Elektroden effektiver gesammelt werden können, bevor sie mit Löchern rekombinieren, und Nanostäbchenstrukturen das Einfangen von Licht zur Verbesserung der Photonenabsorption verbessern können [54, 55]. Mehrere Gruppen haben die Photodetektoren [56, 57], Nanolaser [58, 59], Nano-LEDs [60, 61] und photoelektrochemische Wasserspaltungsanwendungen [62] basierend auf III-Nitrid-Nanostäben [55] demonstriert. Der Nachteil von Nanostäbchen-Solarzellen besteht jedoch darin, dass photogenerierte Elektron-Loch-Paare aufgrund von Oberflächendefekten an zahlreichen Ladungsträgereinfangzentren rekombinieren. Darüber hinaus sind die Herstellungsverfahren von Nanostäbchen-Solarzellen komplizierter als die von Dünnschicht-Bauelementen. Die Überwindung dieser oben genannten Probleme hat jedoch zu einem fast dreifachen Anstieg des PCE geführt, wie von Wallentin et al. wobei das InP-Nanostab-Array einen PCE von 13,8% aufgrund der Optimierung des Nanostab-Durchmessers und der Länge des oberen n-Segments aufweist [54, 63]. Krogstrupet al. zeigte, dass eine hohe Kurzschlussstromdichte (Jsc ) wurde in den Einzelkern-Schale-GaAs-Nanodrahtstrukturen aufgrund einer durch Lichtkonzentration verstärkten Lichtabsorption von mehr als einer Größenordnung erhalten [64]. Wiereret al. [65], Cansizoglu et al. [66] und Nguyen et al. [31] demonstrierten verschiedene Typen von Nitrid-Nanostab-Solarzellen auf einem GaN-Templat und einem Si-Substrat. Der Vergleich der jüngsten Nanostab-/Nanodraht-Photovoltaikforschung ist in den Ergänzenden Informationen aufgeführt:Tabelle S1. Die Beiträge der photoelektrischen Umwandlung von InGaN-Nanostab-Ensemble-Ensemble-Bauelementen mit unterschiedlichem In-Gehalt auf kostengünstigen Si(111)-Substraten wurden jedoch bisher nicht systematisch diskutiert.
In dieser Studie wurden Mg:GaN/InGaN/Si:GaN III-Nitrid-Nanostabensembles mit 8 % und 11 % Indiumkonzentration auf n-dotierten Si (111)-Substraten durch plasmaunterstützte Molekularstrahlepitaxie (PA-MBE, Veeco EPI930). Die strukturellen Eigenschaften und der Indiumgehalt wurden durch hochauflösende Röntgenbeugungsmessungen (HR-XRD, Bede D1) bestimmt. Die Feinstruktur von Nanostäbchen wurde mittels hochauflösender Transmissionselektronenmikroskopie (HR-TEM, FEI E.O Tecnai F20 G2) analysiert. Die Eigenschaften der Stromdichte gegenüber der Spannung (J-V) von Nitrid-Solarzellen wurden unter 1 Sonne, AM 1.5G-Beleuchtung (Newport 94023A) diskutiert. Die externe Quanteneffizienz (EQE, Enli Technology Co., Ltd., QE-R3018) wurde gemessen, um die spektrale Reaktion zu untersuchen. Die Ausrichtungen und Simulationen des Banddiagramms wurden ebenfalls untersucht, um den Elektronen- und Lochtransport zu erklären.
Experimentelle Methode
Wachstumstechnik
Das Wachstum von Si:GaN- und Mg:GaN/InGaN/Si:GaN-Nanostäben basiert auf der plasmaunterstützten Molekularstrahlepitaxie (PA-MBE). Alle Proben wurden mit einem Veeco GEN930 PA-MBE-System gezüchtet, das mit einer 6 N Stickstoff-Plasmaquelle (Veeco, UNI-Bulb) ausgestattet war. Das n-Typ Si (111)-Substrat mit einem spezifischen Widerstand von 0,001–0,005 Ω cm wurde mit Aceton, Isopropanol und entionisiertem Wasser in einem Ultraschallbad für 5 min bei jedem Schritt gereinigt, um restliche organische Verunreinigungen zu entfernen, und dann in a . geätzt 48–51 % HF:H2 O =1:5-Lösung für 5 min, um das native Oxid zu entfernen. Nach dem chemischen Reinigungs-/Ätzprozess wurde das Si-Substrat mit Stickstoffgas trockengeblasen. Das Si-Substrat wurde in die Pufferkammer eingebracht und dann durch einen magnetisch gekoppelten Transferarm in die Wachstumskammer überführt. Vor dem Nanostäbchen-Wachstum wurde das Substrat bei 900°C 30 Minuten lang thermisch gereinigt, um restliches natives Oxid zu entfernen, um eine saubere und geordnete 7 × 7 rekonstruierte Si-Oberfläche zu erhalten. Die aktivierten Stickstoffatome wurden mit einer Plasmakanone erzeugt und ihr Fluss und ihre Reinheit wurden über einen hochauflösenden Massendurchflussregler (HORIBA STEC, SEC-7320 M) und einen Stickstoffreiniger (Entegris, CE35KFI4R) gesteuert. Die hochreinen (6 N oder höher) Ga-, In-, Si- und Mg-Quellen wurden von Festquellen-Effusionszellen bereitgestellt. Das Metall der Gruppe III und N2 Plasmastrahläquivalentdruck (BEP) wurden mit einem Strahlflussmesser gemessen. Durch Steuerung der III/V-Flussverhältnisse bis zum N-reichen Zustand können Nanostäbe erhalten werden. Zuerst wurden selbstorganisierte Si:GaN-Nanostäbchen bei 760 °C für 82 min gezüchtet. Die Desorption von InN ist bei erhöhten Temperaturen kritisch, da Indium von der Probenoberfläche verdampft. Um Indium in den Nanostäben zu halten, wurde die Technik der metallmodulierten Epitaxie (MME) verwendet [67, 68]. MME beinhaltet das periodische Öffnen und Schließen der Metallverschlüsse, um die Metallflüsse zu modulieren, während die N2 Verschluss wird offen gehalten. Zur Abstimmung der In-Konzentration trafen zwei verschiedene Zykluszeiten von In- und Ga-Atomen abwechselnd für 20 s/30 s (Probe B) und 30 s/30 s (Probe C) mit 50 Perioden bei 550 °C auf das Substrat. Schließlich wurde eine Mg:GaN-Schicht bei 600 °C gezüchtet. Die Proben wurden unter 9,25 × 10 –6 . gezüchtet Torr Aktivstickstoff BEP mit Plasmaleistung 450 W, 2,42 × 10 –8 Torr In BEP und 1,93 × 10 –8 torr Ga BEP. Darüber hinaus wurden unter den gleichen Bedingungen auch die einschichtigen Si:GaN-Nanostäbe (Probe A) als kontrollierte Gruppe hergestellt.
Geräteherstellung
Nach dem Nanostäbchenwachstum umfasste der Vorrichtungsherstellungsprozess die folgenden Schritte. (1) Die Gerätefläche von 350 × 350 μm 2 Mesa wurde durch Ätzen bis zum n-Typ-Si mit Tetrafluormethan (CF4 ) basierend auf der reaktiven Ionenätztechnik (Advanced System Technology, Cirie-200) unter Verwendung von Photoresist (Microchemicals GmbH, AZ1400) als Maske. (2) Ein Ultraschallbad mit entionisiertem Wasser wurde verwendet, um lose Nanostäbchen aus dem Gerät mit Ausnahme derjenigen des Mesa-Bereichs zu entfernen. (3) Tauchen Sie die Probe in (NH4 .) )2 S bei 60 °C für 1 min, um die Nitridoberfläche für die Unterdrückung von nativen Oxiden und die Reduktion der strahlungslosen Rekombination zu passivieren [69,70,71,72,73]. (4) Ein 100-nm-Indium-Zinn-Oxid (ITO)-Dünnfilm wurde auf den Nanostäben abgeschieden, um als ohmscher transparenter Mg:GaN-Kontakt durch Sputtern (Advanced System Technology, Psur-100HB) begleitet von Photolithographie (M&R Nano Technology .) zu dienen , AG350-6B) und Abhebetechniken. (5) Mehrschichtige Ti/Al/Ti/Au (20 nm/300 nm/20 nm/50 nm) Gittermetallkontakte auf dem ITO-Film und auf den n-Typ-Si-Substraten wurden durch Elektronenstrahlverdampfung hergestellt (Advanced System Technology , Peva-600E) unter Verwendung von Photolithographie und Abhebetechniken. (6) Alle Gittermetallkontakte wurden durch ein schnelles thermisches Glühsystem (Advanced System Technology, FA04) für 30 s in Stickstoff bei 800 °C geglüht, um ohmsche Kontakte zu erhalten.
TEM-Probenvorbereitung
Um die Kristallstruktur weiter zu untersuchen, wurden einzelne Nanostäbchen der Proben B und C durch Beschallung in Ethanol extrahiert. Nach 30 min Beschallung wurden einige Tropfen der Ethanollösung auf ein Kupfergitter (Ted Pella) aufgetragen und das Ethanol bei Raumtemperatur verdampft. Vor den Messungen wurde die Probe bei 150°C gebacken, um freie organische Lösungsmittel zu entfernen.
Ergebnisse und Diskussion
Morphologische und strukturelle Eigenschaften
Die Draufsichten und Querschnittsansichten von Rasterelektronenmikroskopie(REM)-Bildern sind in Abb. 1a–f gezeigt, die die Morphologie der gewachsenen Nanostäbchen veranschaulichen. Abb. 1 a–c zeigt von links nach rechts die Variation der Oberflächenmorphologie von Si:GaN (Probe A) und Mg:GaN/InGaN/Si:GaN mit unterschiedlichen Aufprallzyklen der In/Ga-Atome von 20 s/30 s (Probe B) bzw. 30 s/30 s (Probe C) während des 50-Zyklen-InGaN-Wachstums. Die Durchmesser der Si:GaN- und Mg:GaN/InGaN/Si:GaN-Nanostäbe betragen 30–100 nm bzw. 80–150 nm, während die Flächendichten ~7 × 10 9 . betragen cm −2 . Die Querschnittsbilder der Nanostäbchen sind in Abb. 1d–f gezeigt und zeigen die Länge der Nanostäbchen für die Proben A bis C mit etwa 700 nm. Die schematische Struktur der Mg:GaN/InGaN/Si:GaN-Proben ist gezeigt in Abb. 1g.
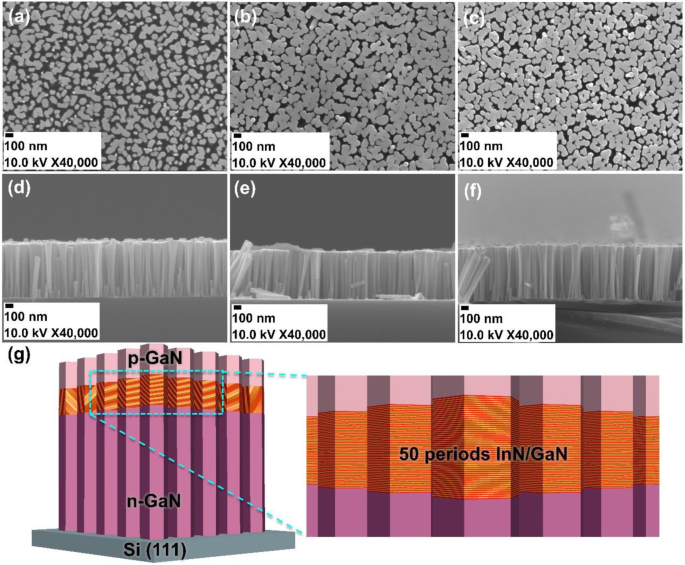
Die SEM-Draufsicht von a n-GaN (Probe A), p-GaN/InGaN/n-GaN mit den In- und Ga-Atomen beaufschlagte Zykluszeiten von b 20 s/30 s (Beispiel B) und c 30 s/30 s (Probe C). Die REM-Querschnittsansichten von d Probe A, e Probe B und f Probe C. g Ein schematisches Diagramm der p-GaN/InGaN/n-GaN-Nanostabstruktur
Abbildung 2 a zeichnete die Röntgen-Theta-2Theta-Beugungsmessung mit Fokus auf verschiedene Zykluszeitproben auf, die auf die Quelle auftreffen. Der stärkste Peak bei 28,44° stammt vom Si-Substrat. Ein scharfer klarer Peak bei 34,56° entspricht der GaN-(0002)-Beugung und zeigt eine gute Hemmung der Phasenmischung von der InGaN-Schicht an. Ein Peak auf der unteren 2-Theta-Seite des GaN (0002)-Peaks bei 34,22 ° für Probe B und bei 34,13 ° für Probe C ist InGaN (0002). Die c Gitterkonstanten von InN und GaN betragen 5,760 bzw. 5,185 [74]. Dem Braggschen Gesetz folgend ist das c Gitterkonstanten von InGaN (0002) werden als 5,23 Å für Probe B und 5,25 Å für Probe C berechnet. Importieren der c Gitterkonstante von InGaN (0002) nach dem Vegard-Gesetz kann die In-Konzentration ohne Berücksichtigung der Dehnung auf 8 % für Probe B und 11 % für Probe C geschätzt werden. Abbildung 2 b zeigt das TEM-Bild mit geringer Vergrößerung von Probe C und ein schematisches Diagramm ihrer Struktur. Bereich 1 und Bereich 2 sind n-GaN- bzw. InGaN-Bereiche. Das im Bereich 1 aufgenommene selektive Bereichselektronenbeugungsmuster (SAED) zeigt, dass die [0001]-Richtung parallel zur Längsachse des Nanostabs und einer gemeinsamen Wachstumsrichtung von Nitrid-Nanostäben ist. Darüber hinaus wird im Kristall keine Versetzung festgestellt. In Abbildung 2 c und d liefern die TEM-Bilder mit atomarer Auflösung das c Gitterkonstanten von GaN und InGaN als 5,19 bzw. 5,25 , die gleichen wie die Ergebnisse, die nach dem Bragg-Gesetz über XRD-Theta-2theta-Scan berechnet wurden. Außerdem ist die c Die Gitterkonstante von InGaN für Probe B beträgt 5,23 über TEM-Bilder mit atomarer Auflösung, die in den ergänzenden Informationen gezeigt werden:Abbildung S1. Darüber hinaus sind in den Ergänzenden Informationen Abbildung S2 enthalten:High Angle Annular Dark Field (HAADF)-Bilder und energiedispersive Röntgenspektroskopie (EDS)-Zeilenscans, die die Indiumverteilung anzeigen 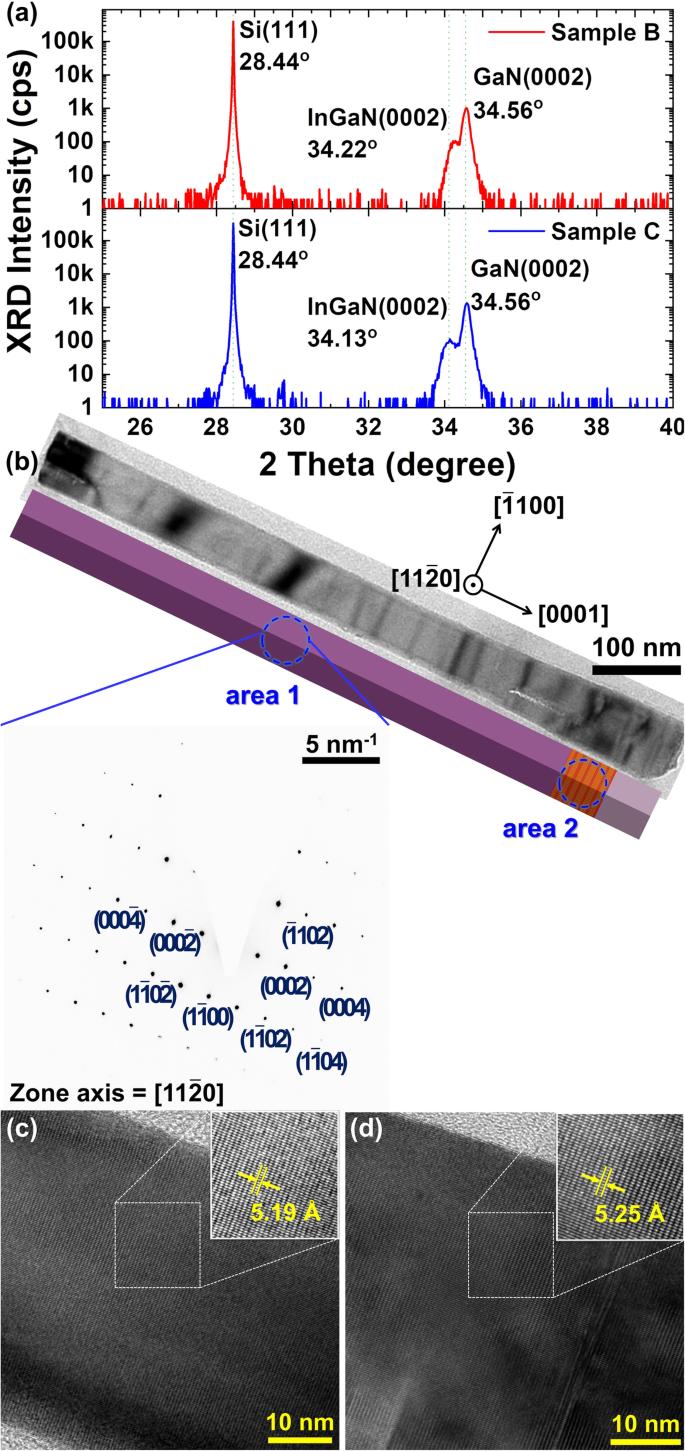
a HR-XRD-Spektren für die Theta-2Theta-Scans. Der Indiumgehalt des InGaN-Materials wurde für Probe B (rote Kurve) auf 8 % und für Probe C (blaue Kurve) auf 11 % geschätzt, wobei das Vegard-Gesetz verwendet wurde. b Das versetzungsfreie Nitrid-Nanostab-TEM-Bild und das SAED-Muster der n-GaN-Region. Das schematische Diagramm eines einzelnen Nanostäbchens unter dem Bild entspricht dem strukturellen relativen Maßstab. Die atomar aufgelösten TEM-Bilder von c n-GaN im Bereich 1 und d InGaN in Bereich 2 zeigt frei von Versetzungen und ihre c Gitterkonstanten
Analyse der elektrischen und optischen Eigenschaften
Die Stromdichte-Spannungs-Messungen wurden mit einem Keithley 2400 Source Meter durchgeführt. Abbildung 3 a zeigt das schematische Diagramm der Nanostäbchen-Solarzelle. Die Gesamtfläche des Geräts beträgt 0,12 mm 2 und die effektive Fläche unter der Beleuchtung ohne das Kontaktmetall beträgt 0,0924 mm 2 . Um photonenerzeugte Elektronen zu sammeln, wird ein 100-nm-transparenter leitender ITO-Film auf der Oberseite des p-GaN abgeschieden, um die Nanostäbe und das Ti/Al/Ti/Au (20 nm/300 nm/20 nm/50 nm .) zu verbinden ) Fingerelektrode. Photoelektrische Kennlinienanalysen des Geräts wurden auch mit einem Sonnensimulator unter 1 Sonne, AM 1,5G-Bedingung durchgeführt, wie in Abb. 3b–d gezeigt. Der Serienwiderstand R s die aus Abb. 3b–d ermittelten Werte sind 83 Ω, 250 Ω und 2,5 kΩ und der Shunt-Widerstand R sch Werte sind 413 kΩ, 550 kΩ und 2 MΩ für die Proben A, B bzw. C. Die Photostromdichte bei Nullspannung, Jsc , von In0,08 Ga0.92 N-Gerät (Beispiel B) und In0.11 Ga0,89 N-Gerät (Probe C) ist 7,77 mA/cm 2 und 14,96 mA/cm 2 bzw. Die Erhöhung des Photostroms bei steigender In-Konzentration wurde über Jsc . nachgewiesen Vergleich. Darüber hinaus haben Krogstrup et al. zeigten, dass die lichtkonzentrierende Eigenschaft von Nanostäbchen-Solarzellen die Lichtabsorption verbessern und einen hohen Photostrom liefern kann [64]. Die Leerlaufspannung (Voc ) und Füllfaktor (FF) von Probe C betragen 0,28 V bzw. 30%. Mehrere Gruppen demonstrierten auch Nanostäbchenstrukturen mit niedrigerem Voc [72, 75, 76]. Zur Veranschaulichung der realen Photovoltaikleistung in einer tatsächlich beleuchteten Fläche, Wirkfläche PCE, PCEeff , legt eine Effizienz basierend auf der effektiven Fläche fest, die die Gitterelektrodenfläche ausschließt, während die Gesamtfläche PCE, PCEtot , betrachtet den gesamten Gerätebereich. Es ist bemerkenswert, dass der PCEtot und PCEeff Werte sind 0,98 % und 1,27 %, was auf einen höheren PCE von Nitrid-Nanostab-Solarzellen hindeutet, der jemals berichtet wurde. Der Hauptbeitrag kommt vom hohen Jsc , obwohl die Voc niedriger ist als bei anderen III-Nitrid-Nanostab-Solarzellen [65, 77]. Es gibt zwei mögliche Gründe für niedrige Voc , einschließlich des Quasi-Fermi-Niveaus, das am p-n-Si-Übergang begrenzt ist, dass die Si-Bandlücke basierend auf dem Banddiagramm 1,12 eV beträgt und ein begrenzter Strompfad aufgrund von Oberflächen-Fermi-Niveau-Pinning erzeugt werden kann [66]. Tabelle 1 fasst Jsc . zusammen , Voc , FF und PCE-Vergleich von drei Proben.
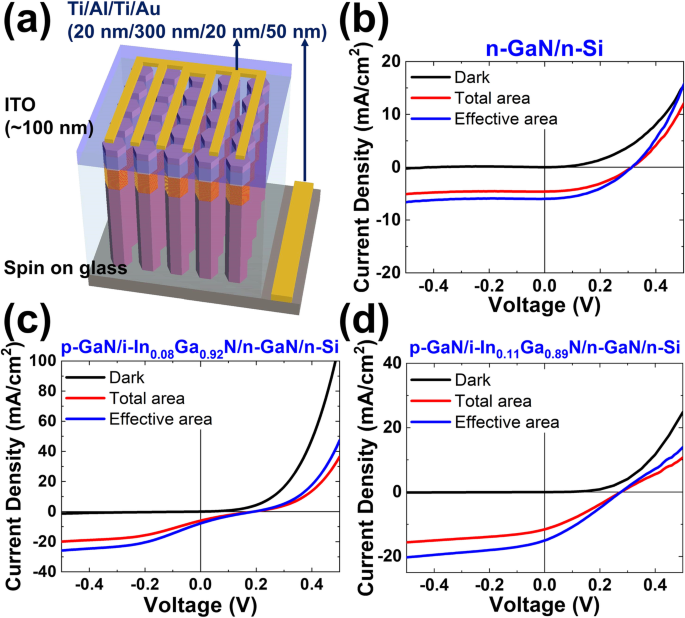
a Schematische Darstellung der Nanostäbchen-Montage-Solarzelle. Die Stromdichte-Spannungs-Kurven von b n-GaN/n-Si, c p-GaN/In0,08 Ga0.92 N/n-GaN/n-Si und d p-GaN/In0,11 Ga0,89 N/n-GaN/n-Si-Nanostäbe bauen Solarzellen zusammen, gemessen unter 1 Sonne, AM 1,5 G Sonnensimulator
Um die physikalischen und elektrischen Eigenschaften zu verstehen, werden die Banddiagramme mit einem 1D-DDCC-Programm (One Dimensional Poisson, Drift-Diffusion, and Schrodinger Solver) berechnet [78]. Die verwendeten Elektronenaffinitäten von ITO, Si und GaN betragen 4,40 eV, 4,05 eV bzw. 4,1 eV. Abbildung 4 a und b zeigen das ITO/n-GaN/n-Si-Banddiagramm ohne Vorspannung bzw. die J-V-Kurve im Dunkeln. Es zeigt, dass die ITO/n-GaN/n-Si-Struktur keine gleichrichtende Wirkung hat und ein lineares J-V-Profil zeigt. Die Potentialbarriere der Hetero-Schnittstelle kann für den Transport von Ladungsträgern ignoriert werden, da erwartet wird, dass der Leitungsband-Offset zwischen Si und GaN einen kleinen Wert von 50 meV beträgt. Diese widerstandsähnliche lineare J-V-Kurve steht im Widerspruch zu den experimentellen Ergebnissen.

a ITO/n-GaN/n-Si-Banddiagramm, b ITO/n-GaN/n-Si J-V-Kurve, c ITO/n-GaN/p-Si/n-Si-Banddiagramm und d J-V-Kurven von ITO/n-GaN/p-Si/n-Si simuliert durch 1D-DDCC-Programm
Eine mögliche Erklärung der Ergebnisse der J-V-Kurve besteht darin, dass die Ga-Diffusion ein p-Si an der GaN/Si-Grenzfläche induziert und einen p-n-Übergang erzeugt. Reichertzet al. [14] und Neplokh et al. [76] haben die Al-Diffusion in das Siliziumsubstrat während des Wachstums von Nitridschichten nachgewiesen. Bor, Al und Ga sind Elemente der IIIB-Gruppe, die ein Dotierungsmittel für die Bildung einer p-Si-Schicht sein können. Die Ga-Diffusionsrate beträgt jedoch 8 nm/Tag bei 700 °C [79]. Abbildung 4 c zeigt ein Banddiagramm, das eine sehr dünne (1 nm) p-Si-Schicht zwischen n-GaN- und n-Si-Grenzfläche enthält. Im p-n-Si-Übergang wird ein kleines eingebautes elektrisches Feld erzeugt, das die Elektronen zum n-Si-Substrat und Löcher zur ITO-Kontaktschicht treiben kann. Die dickenabhängigen J-V-Kurven zeigen, dass die Dioden-Einschaltspannung abnimmt, wenn die Dicke der p-Si-Schichten in Fig. 4d dünner wird. Das ultradünne p-Si wird eine Begrenzung für die Quasi-Fermi-Niveautrennung sein und den Voc . reduzieren der Solarleistung. Die simulierte elektrische Eigenschaft mit der eingeschlossenen p-Si-Schicht kommt diesem Forschungsergebnis näher. Daher kann das Banddiagramm der Mg:GaN/InGaN/Si:GaN/p-Si/n-Si-Struktur als Modell wie in Abb. 5 erstellt werden. Die Beleuchtung von AM 1,5G-Licht von oben führt zur Absorption von Photonen mit einer höheren Energie als die InGaN-Bandlücke. Wenn Licht durch die Stäbe und den Zwischenraum zwischen den Stäben auf das Si strahlt, könnten die Photonen mit einer Energie größer als die Si-Bandlücke auch vom p-n-Si-Substrat absorbiert werden und Photostrom wird erzeugt. Gleichzeitig werden die Elektron-Loch-Paare, die in den Nitridbereichen durch das kurzwellige Licht erzeugt werden, durch ein eingebautes elektrisches Feld des p-i-n-Übergangs getrennt. Am Ende konnten photogenerierte Ladungsträger durch den oberen Indium-Zinn-Oxid (ITO)-Kontakt zu Mg:GaN und den unteren Si-n-Kontakt gesammelt werden. Basierend auf diesem Strukturmodell und unter Berücksichtigung der durch den ITO-Kontakt eingeführten Schottky-Barriere ist die J-V-Kurvensimulation in Abb. 5b gezeigt. Die simulierte J-V-Kurve zeigt, dass die S-Form durch das nicht-ohmsche Verhalten des p-Kontakts verursacht wird. Dies ist ein möglicher Grund, die S-Form zu erklären, die für Mg:GaN/u-InGaN/Si:GaN (Proben B und C) in Abb. 3 c und d existierte. Daher sind die Stromdichten bei negativer Vorspannung (Jnegativer Vorspannung (− 0,5 V) ), wo die S-Form abgeflacht ist, sind in Tabelle S2 vermerkt. Jnegativer Bias kann ein Kontrollpunkt für die weitere Optimierung und einen angestrebten Wert sein.
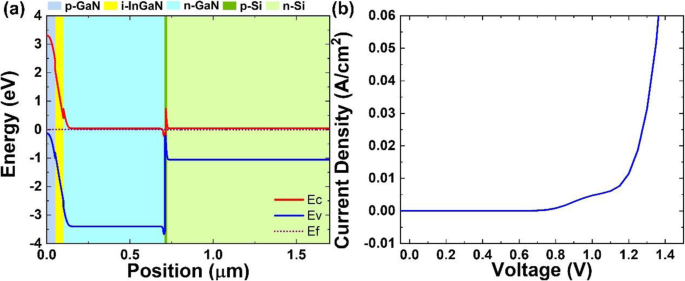
a Das p-i-n-Nitrid-Nanostäbchen auf einem p-n-Si-Solarzellenbanddiagramm, simuliert durch das 1D-DDCC-Programm. b J-V-Kurvensimulation eines p-i-n-Nitrid-Nanostabs auf einer p-n-Si-Solarzelle
Die EQE-Messergebnisse ohne Lichtvorspannung (zusätzliches unmoduliertes Licht) sind in Abb. 6a dargestellt, die die EQE von Si:GaN/n:Si (Probe A), Mg:GaN/u-In0.08 Ga0.92 N/Si:GaN (Probe B) und Mg:GaN/u-In0,11 Ga0,89 N/Si:GaN (Probe C). Probe C hat eine höhere In-Konzentration, die für die höheren Werte bei kurzen Wellenlängen aufgrund der Absorption in der InGaN-Schicht verantwortlich sein könnte. Die maximalen EQEs in den Proben A, B und C betragen 32 %, 55 % bzw. 63 %. Verglichen mit den Reflexionsspektren von Si-Wafern, Proben A, B und C, die in Fig. 6b gezeigt sind, sind die Schwingungen der EQEs und Reflexionsspektren auf die Interferenz von verschiedenen Schichten zurückzuführen. Der blanke Si-Wafer hat aufgrund seiner flachen Oberfläche das höchste Reflexionsvermögen. Die Proben A, B und C haben ein geringeres Reflexionsvermögen, da Nanostabstrukturen einen Lichteinfangeffekt haben. Es wurde festgestellt, dass Probe C die höchste EQE bei langen Wellenlängen und das niedrigste Reflexionsvermögen aufgrund des höchsten Lichteinfangeffekts aufweist. Dieses Ergebnis kann den in Probe C erzeugten höheren Photostrom erklären. Die Photolumineszenzspektren (PL) von Probe B und C bei Raumtemperatur (RT, 300 K) sind in Fig. 6c gezeigt. Der höchste Peak, der sich bei 3,40 eV befindet, ist die GaN-Emission nahe der Bandkante (NBE). Die Peaks bei 3,09 eV und 3,03 eV sind auf In0,08 . zurückzuführen Ga0.92 N und In0,11 Ga0,89 N NBE-Emission. Die Ergebnisse ähneln den Werten aus der Berechnung der Beugungsgleichung von 3,1 eV und 3,0 eV bei RT [4]. Es zeigt auch die gleichen starken Fabry-Perot-Oszillationen (markiert durch Sternzeichen) wie die EQEs und die Reflexionsspektren, die die glatten Grenzflächen zwischen jeder Schicht/Oberfläche darstellen.

a Externe Quanteneffizienzspektren von drei Nitrid-Nanostäben/Si-Proben. b Die Reflexionsspektren von blankem Si-Wafer und drei Nitrid-Nanostäben/Si-Proben. c Die Raumtemperatur-Photolumineszenzspektren von zwei InGaN-Proben
Schlussfolgerung
Hochwertige Mg:GaN/InGaN/Si:GaN- und Si:GaN-Nanostäbe, die auf n-Si durch plasmaunterstützte Molekularstrahlepitaxie aufgewachsen sind, werden erfolgreich demonstriert. Photovoltaik-Messungen zeigen einen PCEeff von 1,27% und einem PCEtot von 0,98% unter 1 Sonne, AM 1,5G Beleuchtung für Mg:GaN/u-In0,11 Ga0,89 N/Si:GaN, das eine höhere In-Konzentration und einen höheren Lichteinfangeffekt aufweist, was einen hohen Photostrom induziert. Obwohl Si:GaN-Nanostäbe auf n-Si-Geräten möglicherweise kein ausgeprägtes eingebautes p-n-Übergangsfeld aufweisen, trägt das Design einer geeigneten Heteroübergangsstruktur dazu bei, die Fototräger zu den oberen und unteren Kontakten zu treiben und die Zellenleistung zu verbessern.
Verfügbarkeit von Daten und Materialien
Die Autoren erklären, dass die Materialien und Daten den Lesern zur Verfügung stehen und alle Schlussfolgerungen in diesem Manuskript auf den Daten basieren, die alle in diesem Papier präsentiert und gezeigt werden.
Abkürzungen
- LED:
-
Leuchtdiode
- PCE:
-
Leistungsumwandlungseffizienz
- Jsc :
-
Kurzschlussstromdichte
- PA-MBE:
-
Plasmagestützte Molekularstrahlepitaxie
- HR-XRD:
-
Hochauflösende Röntgenbeugung
- HR-TEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- EQE:
-
Externe Quanteneffizienz
- BEP:
-
Strahläquivalentdruck
- MME:
-
Metallmodulierte Epitaxie
- ITO:
-
Indium-Zinn-Oxid
- Voc :
-
Leerlaufspannung
- RT:
-
Raumtemperatur
- PL:
-
Photolumineszenz
- NBE:
-
Nahe der Bandkante
Nanomaterialien
- Solarzelle
- Nanobäume für farbstoffsensibilisierte Solarzellen
- Hocheffiziente Graphen-Solarzellen
- Nano-Heterojunctions für Solarzellen
- Photovoltaische Eigenschaften von GaSe/MoSe2-Heterojunction-Bauelementen
- Plasmonenverstärkte Lichtabsorption in (p-i-n) Junction-GaAs-Nanodraht-Solarzellen:Eine FDTD-Simulationsmethodenstudie
- Ein kurzer Fortschrittsbericht zu hocheffizienten Perowskit-Solarzellen
- Hochleitfähige PEDOT:PSS transparente Lochtransportschicht mit Lösungsmittelbehandlung für Hochleistungs-Silizium/organische Hybridsolarzellen
- Elektrodeposition von SnO2 auf FTO und ihre Anwendung in planaren Heterojunction-Perowskit-Solarzellen als Elektronentransportschicht
- Wolfram



