Neue Samsung H-Cube 2.5D-Technologie integriert 6 HBMs für HPC-Anwendungen
Samsung Electronics hat seine Hybrid-Substrat-Cube-Technologie (H-Cube) angekündigt, eine 2,5D-Packaging-Lösung, die auf Halbleiter für HPC-, KI-, Rechenzentrums- und Netzwerkprodukte spezialisiert ist, die eine leistungsstarke und großflächige Packaging-Technologie erfordern.
H-Cube wurde gemeinsam von Samsung Electro-mechanics (SEMCO) und Amkor Technology entwickelt und eignet sich für Hochleistungshalbleiter, die eine große Anzahl von Siliziumchips integrieren müssen. Samsung sagt, dass es das Gießerei-Ökosystem erweitert und bereichert, indem es verschiedene Paketlösungen anbietet, um die Herausforderungen seiner Kunden zu bewältigen.
„In der heutigen Umgebung, in der die Systemintegration zunehmend erforderlich ist und die Substratversorgung eingeschränkt ist, haben Samsung Foundry und Amkor Technology H-Cube erfolgreich gemeinsam entwickelt, um diese Herausforderungen zu meistern“, sagte JinYoung Kim, Senior Vice President des globalen F&E-Zentrums bei Amkor Technology. „Diese Entwicklung senkt die Eintrittsbarrieren in den HPC/AI-Markt und zeigt die erfolgreiche Zusammenarbeit und Partnerschaft zwischen der Foundry und dem ausgelagerten Unternehmen für Halbleitermontage und -test (OSAT).“
H-Cube-Struktur und -Funktionen
2.5D-Packaging ermöglicht es, Logikchips oder Speicher mit hoher Bandbreite (HBM) in einem kleinen Formfaktor auf einem Silizium-Interposer zu platzieren. Die H-Cube-Technologie von Samsung umfasst ein Hybridsubstrat in Kombination mit einem Fine-Pitch-Substrat, das eine feine Bump-Verbindung ermöglicht, und einem High-Density-Interconnection-(HDI)-Substrat, um große Größen in 2,5D-Gehäusen zu implementieren.
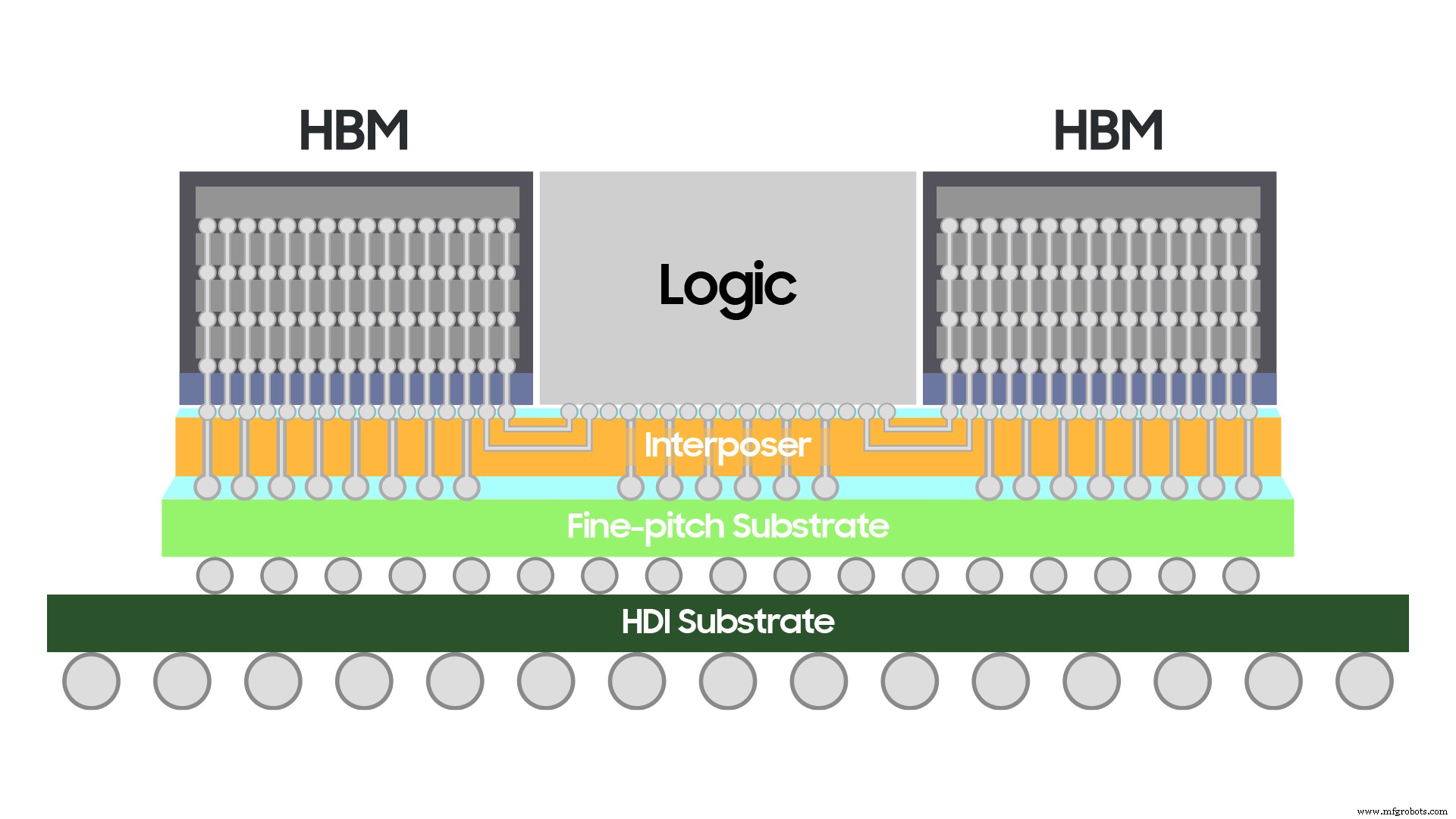
Mit der jüngsten Zunahme der Spezifikationen, die in den Marktsegmenten HPC, KI und Netzwerkanwendungen erforderlich sind, wird großflächiges Gehäuse wichtig, da die Anzahl und Größe der in einem Gehäuse montierten Chips zunimmt oder eine Kommunikation mit hoher Bandbreite erforderlich ist. Für das Anbringen und Verbinden von Silizium-Dies einschließlich des Interposers sind Fine-Pitch-Substrate unerlässlich, aber die Preise steigen aufgrund einer Größenzunahme erheblich.
Bei der Integration von sechs oder mehr HBMs nimmt die Schwierigkeit bei der Herstellung des großflächigen Substrats schnell zu, was zu einer verringerten Effizienz führt. Samsung hat dieses Problem gelöst, indem es eine hybride Substratstruktur verwendet, bei der HDI-Substrate, die einfach großflächig zu implementieren sind, unter einem High-End-Fine-Pitch-Substrat überlappt werden.
Durch Verringern des Abstands der Lotkugel – die den Chip und das Substrat elektrisch verbindet – um 35 % im Vergleich zum herkömmlichen Kugelabstand, kann die Größe des Fine-Pitch-Substrats minimiert werden, während HDI-Substrat (Modul-PCB) unter der Fein- Pitch-Substrat, um die Verbindung mit der Systemplatine zu gewährleisten.
Um die Zuverlässigkeit der H-Cube-Lösung zu verbessern, hat Samsung außerdem seine proprietäre Signal-/Leistungsintegritätsanalysetechnologie verwendet, die eine stabile Stromversorgung ermöglicht und gleichzeitig den Signalverlust oder die Verzerrung beim Stapeln mehrerer Logikchips und HBMs minimiert.
Eingebettet
- Eine neue goldene Ära für die Industrietechnologie
- In Anbetracht dessen, was die neue Metalldrucktechnologie für AM bedeutet
- Technologieoptionen für soziale Distanzierung in Einzelhandelsanwendungen
- Infineon, Xilinx und Xylon arbeiten zusammen, um neue Mikrocontroller-Lösungen für sicherheitskritische Anwendungen zu entwickeln
- Infineon:Neuer Stromsensor für industrielle Anwendungen deckt Bereich von ±25 A bis ±120 A ab
- DATENMODUL:neue Verbindungstechnologie für Großserienprojekte
- DUAGON-MEN-GROUP integriert OEM Technology Solutions Australia
- GE stellt neues Produkt für Steuerungs- und Überwachungsanwendungen vor
- SMI bietet die hochwertigste Verbundtechnologie für militärische Anwendungen
- BASF und Paxis arbeiten an Materialien für neue 3D-Drucktechnologien zusammen



