Auswirkung von UV-Bestrahlung auf die Eigenschaften von 4H-SiC-PiN-Dioden
Zusammenfassung
In dieser Arbeit wird die Wirkung von ultravioletter (UV) Bestrahlung auf die statischen Eigenschaften von Hochspannungs-4H-SiC-PiN untersucht. Vor und nach Bestrahlung mit ultraviolettem Licht wird keine signifikante Änderung der Durchlass-Zustandscharakteristik von 4H-SiC-PiN-Dioden beobachtet. Es hat sich jedoch herausgestellt, dass die Sperrspannung bei UV-Bestrahlung deutlich erhöht wird, was aus der Ausdehnung der Verarmungszone mit der Ansammlung positiver Ladungen unter Zunahme der negativen Oberflächenladungsdichte resultiert. Die Transientenspektroskopie auf tiefem Niveau zeigt, dass die durch UV-Bestrahlung induzierten Defekte auf tiefem Niveau eine dominante Rolle gegenüber den eingefangenen negativen Ladungen spielen und daher zu einer Erhöhung der Sperrspannung von 4H-SiC-PiN-Dioden führen.
Einführung
Siliziumkarbid (SiC) wird aufgrund seiner großen Bandlücke, der hohen kritischen elektrischen Feldstärke, der hohen Elektronensättigungsgeschwindigkeit und der überlegenen Wärmeleitfähigkeit als vielversprechender Materialkandidat für Hochleistungs- und Hochtemperatur-Elektronikgeräte der nächsten Generation erwartet [1 ,2,3,4]. SiC-Bauelemente werden entwickelt, um viele der derzeit in Silizium verwendeten Bauelemente zu ersetzen, insbesondere bei den Anforderungen, die bei hohen Spannungen und Strömen sowie bei Temperaturen über 200 °C betrieben werden müssen. Im Vergleich zu unipolaren Bauelementen haben SiC-Bipolarbauelemente aufgrund des Leitfähigkeitsmodulationseffekts in den letzten Jahren aufgrund von Ultrahochspannungsanwendungen erhebliches Interesse auf sich gezogen. Als typisches bipolares Gerät wurde die 4H-SiC-PiN-Hochspannungsdiode demonstriert, die eine potenzielle Wahl für Hochspannungsgleichrichteranwendungen ist, einschließlich fortschrittlicher intelligenter Netze, Energiespeicher und gepulster Leistung [5,6,7,8]. Bei dem Herstellungsprozess von SiC-Leistungsvorrichtungen werden verschiedene Plasmaprozesse wie Trockenätzen und Sputterabscheidung weit verbreitet verwendet. Es wurde über mehrere Arbeiten zu prozessinduzierten Schäden in SiC-Bauelementen berichtet, die eine elektrische Degradation bewirken [9, 10]. Darüber hinaus haben frühere Studien gezeigt, dass UV-Bestrahlung die Leistung von SiC-Metall-Oxid-Halbleiter-Feldeffekttransistoren (MOSFETs) durch hochenergetischen Ionenbeschuss und Plasma-Photoemission signifikant reduziert [11, 12]. Kürzlich wurde berichtet, dass gepulste UV-Laserbestrahlung auf 4H-SiC-Metall-Oxid-Halbleiter (MOS) die grenzflächennahe Oxidfalle induzieren und zu einer Drift der Geräteleistung und einer Verschlechterung der Zuverlässigkeit führen kann [13]. Nach unserem besten Wissen wurde die UV-Bestrahlung von SiC-PiN-Bauelementen jedoch noch nicht untersucht und es ist notwendig, die Auswirkungen auf die Eigenschaften von SiC-PiN-Bauelementen zu verstehen.
In dieser Studie haben wir die Wirkung von UV-Bestrahlung auf 4H-SiC-PiN-Dioden auf die Vorwärts- und Rückwärtssperreigenschaften unter Verwendung von UV-Bestrahlung mit einer Wellenlänge von 184,9 nm untersucht. Der Einfluss der Oberflächenladungsakkumulation auf die Durchbruchspannung von SiC-PiN-Dioden wird mit Hilfe von Technology Computer-Aided Design (TCAD)-Simulation dargestellt. SiO2 /SiC-Zustandsdichten vor und nach der Bestrahlung wurden durch ein Deep-Level-Transient-Spektroskopie-(DLTS-)System auf SiC-MOS charakterisiert. DLTS wird häufig verwendet, um die Verteilung der Grenzflächenzustandsdichte (Dit) und tiefe Defekte in MOS-Kondensatoren zu untersuchen [14, 15].
Methoden
Die schematische Struktur der 4H-SiC-PiN-Diode, über die in diesem Artikel berichtet wird, ist in Abb. 1 gezeigt. Die 2 μm dicke Pufferschicht, dotiert auf 1 × 10 18 cm −3 und 60 μm dicke n-Driftschicht mit einer Dotierungskonzentration von 2 × 10 14 cm −3 wurden kontinuierlich auf stark dotierten n-Typ 4H-SiC(0001)-Substraten um 4º außeraxial gezüchtet. Dann war die oberste Schicht eine p + -Anode mit einer Dicke von 2 μm und einer Dotierungskonzentration von 2 × 10 19 . cm −3 . Nach dem epitaktischen Wachstum wurde eine kreisförmige Isolationsmesastruktur mit 2,5 μm Höhe und 300 μm Durchmesser unter Verwendung von induktiv gekoppeltem Plasma strukturiert, das durch die p + -Anodenschicht in die n-Driftschicht reagiert. Die Ätzgase und das Maskenmaterial waren SF6 /O2 bzw. durch plasmaunterstützte chemische Gasphasenabscheidung abgeschieden. Nach der Mesa-Isolierung ein doppeltes Al-Implantat von 1 × 10 17 cm −3 basierte Junction Termination Extension (JTE) wurde gebildet, um das Zusammendrängen des elektrischen Felds nahe der Mesakante zu verringern. Die Implantate wurden durch Tempern in Ar bei 1650 °C für 30 Minuten aktiviert. Ein Opfer-SiO2 Schicht wurde bei 1100 °C für 1 h gezüchtet und in HF getaucht, um eine frische Oberfläche für die thermische Oxidation bereitzustellen. Anschließend thermische Oxidation in trockenem O2 Umgebungstemperatur wurde 3 h lang bei 1100 °C mit SiO2 . durchgeführt Schichtdicke von etwa 40 nm, gefolgt von Tempern in Ar-Umgebung bei 1100 °C für 1 h. Kontaktmaterialien waren Ni/Ti/Al für die Anode und Ni für die Kathode. Diese Metalle wurden 2 Minuten lang bei 800 °C und 1000 °C geglüht, um einen hochwertigen ohmschen Kontakt zu erhalten. Die spezifischen Kontaktwiderstände, die durch das Verfahren der linearen Übertragungslänge charakterisiert wurden, betrugen 1 × 10 –5 Ω cm 2 und 3,75 × 10 −5 Ω cm 2 für ohmsche Kontakte vom Ni n-Typ bzw. vom Ni/Ti/Al p-Typ. Auf Anode und Kathode wurde Metall mit dickem Al abgeschieden. Die Siliziumdioxidschicht und eine dicke Polyimidschicht wurden auf der Vorderseite strukturiert, um Oberflächenfunken bei Hochspannungsmessungen zu vermeiden. Darüber hinaus wurden die SiC-MOS-Kondensatoren auf einem hochwertigen n-Typ (7 × 10 15 cm −3 ) Epitaxieschicht auf einem stark dotierten 4H-SiC-Substrat. Das 40 nm lange thermische Oxid wurde basierend auf dem Standardprozess von SiC PiN gezüchtet. Die Gate-Elektrode und der rückseitige ohmsche Kontakt wurden mit Al bzw. Ni gebildet.

Schematischer Querschnitt von 4H-SiC-PiN-Dioden
4H-SiC-PiN-Dioden und SiC-MOS-Kondensatoren wurden 72 h lang ohne Vorspannung mit UV-Licht unter Verwendung einer Quecksilberlampe mit einer Wellenlänge von 184,9 nm in Luft bestrahlt. Die elektrischen Eigenschaften von 4H-SiC-PiN vor und nach der UV-Bestrahlung wurden mit der Wentworth-Sonde und dem Halbleiter-Charakterisierungssystem Agilent B1505A bewertet. SiC-MOS-Kondensatoren Schnittstellenzustände und feste Ladungen wurden dann durch ein PhysTech Fourier Transform DLTS-System charakterisiert. Die angelegte Sperrspannung V R und die Füllpulsspannung V P waren 15 V bzw. 2 V. Der Abtastzeitraum t w des Bias-Impulses von V R zu V P war 1,5 s.
Ergebnisse und Diskussion
Die Wirkung der UV-Bestrahlung auf die statischen Eigenschaften von SiC PiN ist in den Fig. 1 und 2 gezeigt. 2 und 3, wo die vor und nach der Bestrahlung gemessenen Eigenschaften für Gerät 1 (D1) und Gerät 2 (D2) verglichen werden. Der Durchmesser der kreisförmigen SiC-PiN-Dioden beträgt 3,5 mm und die aktive Fläche beträgt etwa 10 mm 2 . Der Durchlassspannungsabfall für SiC PiN beträgt etwa 3,95 V bei einer Stromdichte von 100 A/cm 2 für beide Geräte vor der UV-Bestrahlung. In Abb. 2 ist deutlich zu erkennen, dass es bei zwei Geräten keine signifikanten Änderungen der Durchlass-Ein-Zustandscharakteristik gibt, die sich nach UV-Bestrahlung von 3,95 auf 4,0 V ändert. Die erreichten Sperrspannungen von Vorrichtung 1 und Vorrichtung 2, die auf einer 60 μm dicken n-Drift-Epischicht hergestellt sind, betragen 7 kV bzw. 7,2 kV bei einem Leckstrom von weniger als 1 μA. Es sollte beachtet werden, dass die Sperreffizienz von PiN-Dioden etwa 70 % des theoretischen Wertes von 9,7 kV für eine 60 μm dicke Driftschicht beträgt, was aufgrund der Ungenauigkeit der Störstellenaktivierung wahrscheinlich zu einer Abweichung vom optimalen JTE-Implantationsfenster führt. Nach der UV-Bestrahlung zeigt die Sperrspannung von Gerät 1 einen bemerkenswerten Anstieg von 7 auf 9,2 kV mit einer Verbesserung um 2,2 kV und nähert sich dem idealen Wert für die parallele Ebene an. Dementsprechend wird für Gerät 2 nach der UV-Bestrahlung eine Verbesserung um 1,7 kV erreicht.

Durchlasscharakteristik der 4H-SiC-PiN-Diode vor und nach der UV-Bestrahlung
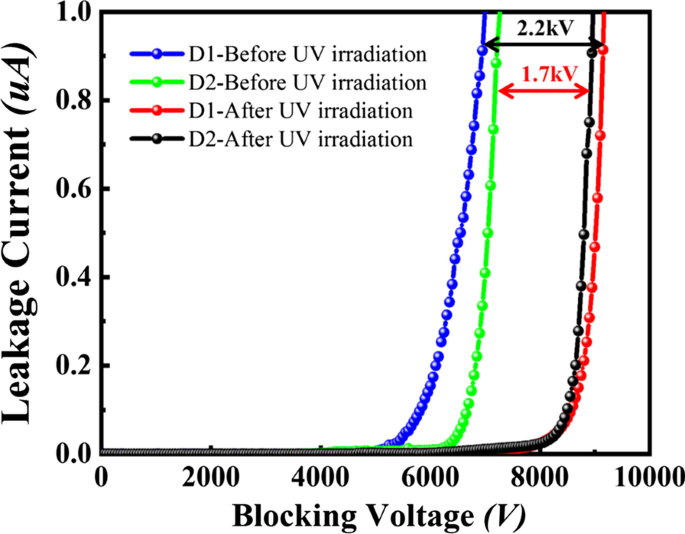
Umkehrcharakteristik der 4H-SiC-PiN-Diode vor und nach der UV-Bestrahlung
Es ist bekannt, dass die Oberflächenfallen einen signifikanten Einfluss auf die Verteilung des elektrischen Felds im Anschlussbereich haben und dann die Sperreigenschaften in der SiC-Leistungsvorrichtung beeinflussen. Ikeguchiet al. haben gezeigt, dass hochenergetische UV-Beleuchtung mit Photonenenergie ≥ 5 eV die bereits bestehenden gespannten C-C-Doppelbindungen in aktive Elektronenfallen umwandeln kann und somit zur Erzeugung negativ geladener Grenzflächendefekte führt, die bei positivem V<. beobachtet werden /i> FB Verschiebung der C/V-Kurven [11, 12]. Unterdessen kann das durch UV-Bestrahlung erzeugte Elektron durch Grenzflächendefekte in tiefen Fallen eingefangen werden und somit mit der Zunahme der festen Ladungsdichte negativ geladen werden. Abbildung 4 veranschaulicht die Abhängigkeit der simulierten Sperreigenschaften von der Implantationskonzentration für eine doppelt implantierte JTE-SiC-PiN-Diode mit verschiedenen negativen Oberflächenladungen. Es ist offensichtlich, dass die Oberflächenladungen im JTE-Bereich einen signifikanten Einfluss auf die Rückwärtssperrleistung haben, insbesondere wenn die JTE-Implantationskonzentration vom optimalen Fenster abweicht. Für eine gegebene Doppelimplantations-Abschlussstruktur könnte mit der Zunahme der negativen Oberflächenladungen ein breiteres optimales Fenster des Zielsperrwerts erreicht werden. Es ist klar, dass die JTE-Struktur weniger empfindlich auf die Grenzflächenladung unter 1 × 10 11 . reagiert cm −2 und die Sperrspannung hat keine offensichtliche Änderung. Mit einer Oberflächenladungsdichte von mehr als 5 × 10 11 cm −2 , würde die Durchbruchspannung dramatisch ansteigen. Überraschenderweise erreicht die Durchbruchspannung ungefähr den theoretischen Wert mit einem Implantationsfenster von 2 × 10 16 cm −3 bis 8 × 10 17 cm −3 bei einer Oberflächenladungsdichte von 1 × 10 13 cm −2 .

Simulierte Durchbruchspannung versus JTE-Implantationskonzentration für negative Oberflächenladung, einschließlich keiner Ladung, 1 × 10 11 cm −2 , 5 × 10 11 cm −2 , 1 × 10 12 cm −2 , 5 × 10 12 cm −2 , und 1 × 10 13 cm −2 bzw.
Abbildung 5 vergleicht den Einfluss einer negativen Oberflächenladungsakkumulation auf das Profil des elektrischen Felds bei der Sperrcharakteristik. Die Verteilung des elektrischen Felds mit der Entwicklung des Verarmungsbereichs in den 4H-SiC-PiN-Dioden ist in Abb. 5a gezeigt. Wenn die negative Ladung auf 5 × 10 12 . ansteigt cm −2 am SiO2 /SiC (JTE-Strukturregion)-Grenzfläche von SiC-PiN wird die positive Ladung der N-Driftschicht an der Grenzflächenoberfläche gesammelt, was zu einer signifikanten Erweiterung der Verarmungszone führt [16]. Die Abb. 5b zeigt die Schnittlinie des elektrischen Felds unter dem Übergang der JTE/n-Drift-Region mit einer negativen Oberflächenladungsdichte von 1 × 10 11 . und 5 × 10 12 cm −2 . Bei geringer Oberflächenladung von 1 × 10 11 cm −2 , tritt eine starke Verdrängung des elektrischen Felds im Randabschlussbereich mit einem Maximalwert von 2,5 MV/cm auf und die Durchbruchspannung beträgt etwa 8 kV. Wenn die Ladungsdichte auf 5 × 10 12 . ansteigt cm −2 fällt das elektrische Spitzenfeld auf 2,2 MV/cm ab, und die Ansammlung des elektrischen Felds am Randabschlussbereich wird im Vergleich unterdrückt. Inzwischen ist die Verteilung des elektrischen Felds gleichmäßiger und die Durchbruchspannung steigt offensichtlich an. Daher kann eine negative Oberflächenladung eine Ausweitung der Verarmung bewirken und die Ansammlung des elektrischen Felds verringern, was zu einer Verbesserung der Durchbruchspannung führt.

Simulierte elektrische Feldverteilungen von SiC PiN mit einer negativen Oberflächenladungsdichte von 1 × 10 11 cm −2 und 5 × 10 12 cm −2 :a Verteilung des elektrischen Felds mit der Entwicklung der Verarmungsregion b Schnittlinie des elektrischen Felds unter dem Übergang der JTE/n-Drift-Region. Die Implantationskonzentration beträgt 6 × 10 16 cm −3
Um die physikalischen Mechanismen der Erzeugung der durch Strahlung induzierten elektronischen Defekte weiter zu validieren, eine bessere elektrische Charakterisierung von SiO2 /SiC-Schnittstelle ist erforderlich, um mehr Details zu untersuchen. DLTS-Spektren für 4H-SiC-SiC-MOS-Kondensatoren wurden in einer Verarmung von 15 auf 2 V vor und nach der UV-Bestrahlung charakterisiert, wie in Abb. 6 gezeigt. Aus den DLTS-Spektren wurden zwei Peaks in den 4H-SiC-MOS-Kondensatoren vor beiden beobachtet und nach UV-Bestrahlung bei 210 K bzw. 490 K. Negative DLTS-Peaks zeigen an, dass das P1- und P2-Niveau Elektronenfallen sind. Das breite und signifikante P2-Niveau zeigt einen signifikanten Anstieg der Spitzenamplitude, was bedeutet, dass die Konzentration der Elektronenfalle durch UV-Bestrahlung erhöht wird. Außerdem wurde festgestellt, dass das DLTS-Signal proportional zur Füllzeit ansteigt und eine Kinetik zum Füllen von Fallen zeigt, die für ausgedehnte Defekte charakteristisch ist, wie beispielsweise Grenzflächendefekte anstelle von Punktdefekten. Die Einfügung zeigt die Verteilungen der Grenzflächenzustandsdichte gegenüber der Aktivierungsenergie ET . Die Grenzflächenzustandsdichte wird berechnet durch \(D_{{{\text{it}}}} =\varepsilon_{{{\text{sic}}}} C_{{{\text{ACC}}}} AN_{{ \text{D}}} \Delta C/\left[ {C_{R}^{3} kT} \right]\) [17]. Aus der Abbildung ist ersichtlich, dass der Grenzflächendefekt zu einem Energieband in der Bandlücke von E . führt C − 0,65 eV bis E C − 1,25 eV und seine Dichte von 2 × 10 12 . deutlich erhöht cm −2 eV −1 bis 6 × 10 12 cm −2 eV −1 nach UV-Bestrahlung. Dong et al. schlugen vor, dass diese Grenzflächendefekte von einem negativ geladenen Überschuss an gespaltenem interstitiellem Kohlenstoff an der Grenzfläche herrühren [18]. Der P1-Peak bei 210 k entspricht einer Elektronenfalle bei E C − 0,41 eV. Seine Konzentration zeigt nach UV-Bestrahlung keine wesentliche Änderung, und die P1-Falle ordnete versuchsweise Punktdefekten in der SiC-Epischicht zu. Seine atomare Konfiguration ist jedoch noch unklar und muss in zukünftigen Untersuchungen geklärt werden.
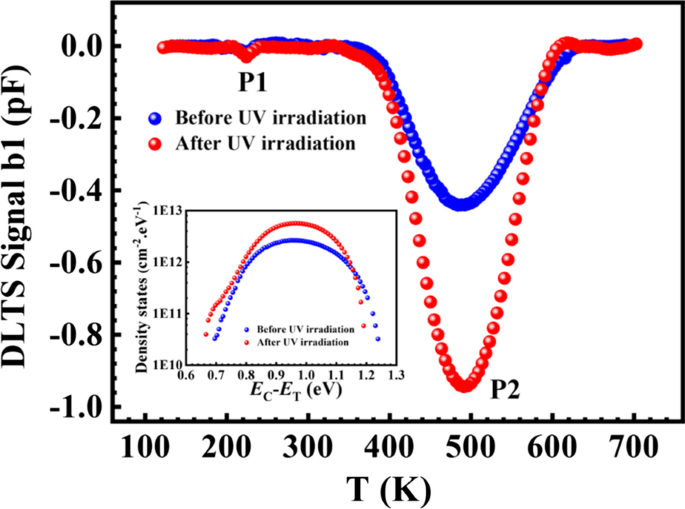
DLTS-Spektren für 4H-SiC-PiN-Dioden vor und nach UV-Bestrahlung. Die Einlage zeigt das D it-Verteilungen für 4H-SiC-PiN-Dioden vor und nach UV-Bestrahlung
Schlussfolgerungen
Der Einfluss von UV-Bestrahlung auf die elektrischen Eigenschaften von 4H-SiC-PiN-Dioden wurde untersucht. Aus den Ergebnissen elektrischer Experimente wird eine unbedeutende Änderung des Durchlassstroms nach UV-Bestrahlung beobachtet. Die UV-Bestrahlung zeigt jedoch einen bemerkenswerten Anstieg der Sperrspannung. Es hat sich herausgestellt, dass die UV-Bestrahlung Defekte in der Grenzfläche von PiN-Dioden mit tiefen Pegeln erzeugt, was zu einer Zunahme der tiefen Akzeptorpegel in der Bandlücke führt. Diese Defekte auf tiefer Ebene dienen als Zentrum des Elektroneneinfangs und führen zu einem signifikanten Anstieg der negativen Ladung in SiO2 /SiC-Schnittstelle. Die positiven Ladungen der N-Dift-Schicht werden an der Grenzflächenoberfläche gesammelt und fördern die Ausdehnung des Verarmungsbereichs mit einer gleichmäßigeren Verteilung des elektrischen Felds, was eine Erhöhung der Sperrspannung bewirkt.
Verfügbarkeit von Daten und Materialien
Alle Daten stehen uneingeschränkt zur Verfügung.
Nanomaterialien
- Dioden
- Spezielle Dioden
- Nudelholz
- Bowling-Pin
- Eigenschaften von Glasfasern
- Auswirkung der Verteilung von Goldnanopartikeln in TiO2 auf die optischen und elektrischen Eigenschaften von farbstoffsensibilisierten Solarzellen
- Wirkung von Polyethylenglykol auf die NiO-Photokathode
- Auswirkung des Glühens auf Mikrostrukturen und Härtung von Helium-Wasserstoff-implantierten sequentiell Vanadium-Legierungen
- Auswirkung einer Wolfram-Nanoschicht-Beschichtung auf eine Si-Elektrode in einer Lithium-Ionen-Batterie
- Fast Effizienz-Droop-Free AlGaN-basierte UV-Licht emittierende Dioden mit einer speziell entwickelten Übergitter-Elektronenblockierschicht vom p-Typ für eine hohe Mg-Dotierungseffizienz



