Strukturverschiebung von GaN zwischen Nanowall-Netzwerken, Nanosäulen und Compact Films Grown on Si (111) by MBE
Zusammenfassung
Die Strukturverschiebung des GaN-Nanowandnetzwerks, der Nanosäule und des kompakten Films wurde auf Si (111) durch plasmaunterstützte Molekularstrahlepitaxie (MBE) erfolgreich erhalten. Erwartungsgemäß wurde ein Wachstum der GaN-Nanosäulen in N-reichen Bedingungen auf blankem Si beobachtet, und das Wachstum verlagerte sich zu einem kompakten Film, wenn der Ga-Fluss verbessert wurde. Interessanterweise wächst GaN in Form des Nanowandnetzwerks, wenn vor dem GaN-Wachstum eine Vorabscheidung von Aluminium (Al) für 40 s durchgeführt wurde. Die Ergebnisse zeigen, dass das vorab abgeschiedene Al in Form von Tröpfchen mit einem typischen Durchmesser und einer Höhe von ~ 80 bzw. ~ 6,7 nm austritt. Ein Wachstumsmodell für das Nanowall-Netzwerk wird vorgeschlagen und der Wachstumsmechanismus diskutiert. GaN wächst im Bereich ohne Al-Tröpfchen, während das Wachstum über Al-Tröpfchen behindert wird, was zur Bildung eines kontinuierlichen GaN-Nanowandnetzwerks führt, das die Hindernisse bei der Herstellung von Nanogeräten beseitigt.
Hintergrund
Als direkte Halbleiter mit großer Bandlücke haben GaN und verwandte Verbindungen große Erfolge in Leuchtdioden [1,2,3], Laserdioden [4] und Transistoren mit hoher Elektronenmobilität [5, 6] erzielt. Die Heteroepitaxie des GaN-Films auf Saphir, Siliziumkarbid oder einkristallinem Silizium induziert jedoch eine hohe Versetzungsdichte. Es wird angenommen, dass ihre Nanostrukturen aufgrund ihrer versetzungsfreien, spannungsfreien und großen Oberfläche-zu-Volumen-Verhältnisse eine überlegene Leistung aufweisen [7, 8]. An den GaN-Nanosäulen und Nanodrähten wurde intensiv geforscht [9,10,11,12]. Die Nanosäulen-Nukleation von GaN erfolgt spontan durch den Volmer-Weber-Wachstumsmechanismus [13], während stickstoffreiche (N-reiche) Bedingungen das Zusammenwachsen der Nukleationsstellen verhindern. Der Herstellung einer elektrischen Vorrichtung auf den GaN-Nanodrähten oder auf den Nanosäulen wurde viel Aufmerksamkeit geschenkt. Die GaN-Nanodrähte wurden mechanisch auf SiO2 . dispergiert /Si-Substrat und ohmsche Kontakte auf zwei Seiten eines einzelnen Nanodrahts zufällig gebildet [14]. In einem anderen Fall [15] wurde eine Seite des Nanodrahts an einem mit der negativen Elektrode verbundenen Tisch befestigt, während die andere Seite mit einem Rasterelektronenmikroskop (REM) auf die positive Elektrode ausgerichtet wurde, um ein elektrisches Gerät für die wissenschaftliche Forschung zu bilden.
Alternativ ist eine spezielle Nanostruktur, nämlich das GaN-Nanowall-Netzwerk, das in der Ebene elektrisch leitfähig ist, vielversprechend, da kein komplexer Prozess für die Herstellung von Nano-Geräten benötigt wird. Im Jahr 2007 wurde das Wachstum des GaN-Nanowandnetzwerks von Kishinos Gruppe unter Verwendung einer durch Elektronenstrahllithographie strukturierten Ti-Schicht als Maske erreicht [16]. Vor einigen Jahren wurde das Wachstum des GaN-Nanowandnetzwerks ohne jegliche Lithographie erfolgreich auf Saphir- und Siliziumsubstraten erreicht [17,18,19]. Die Bandkanten-Emissionsintensität des GaN-Nanowandnetzwerks ähnelt der der GaN-Nanosäulen und die gelbe Lumineszenz ist nicht offensichtlich, was auf eine hohe Qualität des GaN-Nanowandnetzwerks hinweist. Anders als die getrennte Nanostruktur wie die Nanosäulen ist das Nanowandnetzwerk in der Ebene elektrisch leitfähig [18, 20, 21], sodass es so einfach wie der Film zu einem Nanogerät verarbeitet werden könnte [22]. Daher könnte das Hindernis der Bauelementherstellung auf den getrennten Nanosäulen durch die elektrische Leitung des Nanowandnetzwerks in der Ebene beseitigt werden. Es ist von entscheidender Bedeutung, den Wachstumsmechanismus des Nanowall-Netzwerks zu untersuchen. Die durch Versetzungen induzierte spontane Bildung eines Nanowandnetzwerks wird als Wachstumsmechanismus des GaN-Nanowandnetzwerks auf nacktem c . angesehen -Flugzeug Saphir [23]. Da die durch Versetzungen induzierte Bildung von Nanowandnetzwerken kaum kontrolliert werden kann, wurde das Nanowallnetzwerkwachstum auf Si(111)-Substrat mit Al-Pufferschicht [18] durchgeführt. Der Wachstumsmechanismus der Nanowand auf Si (111) unterscheidet sich deutlich von dem auf bloßem Saphirsubstrat; Es werden jedoch keine Untersuchungen durchgeführt, obwohl der Wachstumsmechanismus auf Si (111) der Schlüssel für das Wachstum des Nanowall-Netzwerks ist.
In dieser Arbeit wird das Wachstum von GaN in verschiedenen Strukturen, einschließlich des Nanowandnetzwerks, der Nanosäulen und des Kompaktfilms, systematisch untersucht. Verschiedene oben erwähnte GaN-Strukturen wurden auf Si (111) unter Verwendung von Plasma-unterstützter Molekularstrahlepitaxie (MBE) aufgewachsen. Die Ergebnisse zeigen, dass die Strukturverschiebung des GaN-Wachstums durch Anpassen des Ga/N-Verhältnisses und durch Hinzufügen der vorab abgeschiedenen Al-Tröpfchen erreicht werden kann. Die Morphologie und Photolumineszenz des GaN-Nanowandnetzwerks wurden mit Feldemissions-Rasterelektronenmikroskopie (FESEM) und Photolumineszenz-Spektrumanalysator mit He-Cd-Laser (325 nm, 200 mW) als Anregungsquelle gemessen. Zur Charakterisierung der zuvor abgeschiedenen Al-Schicht wurde ein Rasterkraftmikroskop (AFM) verwendet. Der Wachstumsmechanismus eines GaN-Nanowandnetzwerks auf Si (111) mit metallischen Al-Tröpfchen wird vorgeschlagen.
Experimentell
GaN-Strukturen wurden auf den Si (111)-Substraten durch ein Riber 32 MBE-System, das mit einem N2 . ausgestattet war, aufgewachsen HF-Plasmaquelle (Veeco, RFS-N/TH). Der Druck der Wachstumskammer wurde auf 3,0 × 10 – 10 . gepumpt Torr vor dem Wachstum. Die N2 Gas, Ga und Al mit einer Reinheit von 99,9999% wurden in diesem Experiment verwendet. Si (111)-Substrat (ohne Dotierung, eine Seite zum Wachstum poliert, 380 ±20 μm, bereitgestellt von Sigma-Aldrich) mit einem spezifischen Widerstand> 5000 Ω cm wurde durch Standard-RCA-Verfahren gereinigt, gefolgt von Eintauchen in HF:H2 O = 1:50 für einige Sekunden, um die Siliziumoxidschicht auf der Oberfläche des Si-Substrats zu entfernen sowie eine wasserstoffterminierte Oberfläche zu bilden.
Für das Wachstum der GaN-Nanosäulen werden die Shutter der N2 Plasma und die Ga-Quelle wurden gleichzeitig geöffnet und das blanke Si (111) wurde auf 973 K erhitzt. Die Leistung und der Druck des N2 Die in allen Proben dieser Arbeit verwendete Plasmaquelle war auf 400 W und 4,2 × 10 − 5 . festgelegt Torr bzw. Vor dem Wachstum des GaN-Nanowandnetzwerks wurden die Al-Tröpfchen mit einem Durchmesser von etwa 80 nm auf dem blanken Si (111) abgeschieden, das auf 973 K erhitzt wurde. Die Al-Quelle wurde bei 1323 K gehalten. Die Vorabscheidung der Al-Tröpfchen führte zu einer anderen Keimbildung und einem anderen Wachstum von GaN, was zum Wachstum des Nanowandnetzwerks führte. Der Ga-Fluss für das Wachstum des Nanowandnetzwerks war bei den Nanosäulen gleich (φ Ga = 1,2 × 10 − 7 Torr bei 1169 K). Für das Wachstum des GaN-Films wurde der Ga-Fluss auf 5,3 × 10 – 7 . erhöht Torr, während der N-Fluss konstant gehalten wurde.
Ergebnisse und Diskussion
Wenn die Fensterläden von N2 Plasma und Ga wurden gleichzeitig geöffnet, GaN (S1 ) wuchs in Form von Nanosäulen auf dem bloßen Si (111), wie in Abb. 1a gezeigt. Der Ga-Fluss betrug 1,2 × 10 – 7 Torr und das Si (111)-Substrat wurden bei 973 K gehalten, wie in Tabelle 1 gezeigt. Es wird beobachtet, dass der Durchmesser der GaN-Nanosäulen von 52 bis 125 nm bei einer Länge von ~ 460 nm reicht. Die Dichte der aus dem SEM-Bild gezählten Nanosäulen beträgt ~ 10 7 mm − 2 . Offensichtlich stehen die meisten der in Abb. 1b beobachteten Nanosäulen nicht senkrecht zum Substrat, sondern neigen mit einem Winkel von ~ 30°. Die obere Oberfläche der Nanosäulen ist glatt, in Übereinstimmung mit Bertness’s Bericht [9]. Es wird angenommen, dass die Nanosäulen spontan nukleieren und sich dann ausbreiten, da der Haftkoeffizient auf dem (0 0 01) c -Ebene ist höher als die auf der {110 0} m -Flugzeug. Die Diffusionslänge L des absorbierten Ga-Atoms (Gaab ) ist essenziell für das Wachstum der Nanosäulen. Wie in Gl. (1), die Diffusionslänge L abhängig von der durchschnittlichen Sprungweite a , der Gaab Desorptionsenergie Q des , und die Aktivierungsenergie für einen Oberflächendiffusionssprung Q d [13].
$$ L=\sqrt{2}a\ \exp \left(\frac{Q_{\textrm{d}\textrm{es}}-{Q}_{\textrm{d}}}{2 kT}\ rechts) $$ (1)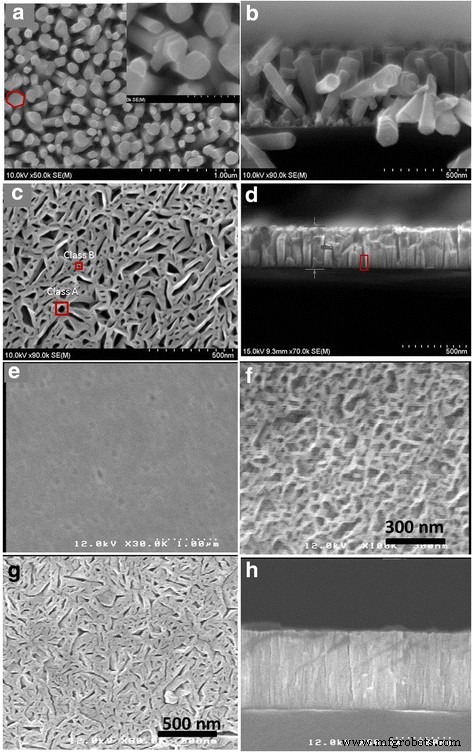
FESEM-Bilder von Proben, die unter verschiedenen Bedingungen gezüchtet wurden. a , b Entsprechend den GaN-Nanosäulen (Probe S1 ). c , d Entsprechend dem GaN-Nanowall-Netzwerk (Probe S2 ), e Entsprechend dem Kompaktfilm (Beispiel S3 ), f Entspricht dem GaN-Nanowall-Netzwerk (Probe S4 ) in der beginnenden Wachstumsphase. g , h Entspricht dem bei einer niedrigeren Temperatur von 900 K gewachsenen GaN-Nanowandnetzwerk (Probe S5 )
Da die atomar flachen Seitenwände der Nanosäulen nur wenige Adsorptionsstellen bieten, wird angenommen, dass die Gaab Diffusionslänge L auf der m -Ebene der Seitenwände ist viel höher als die auf der c -Ebene, was zum vertikalen Wachstum von GaN zu Nanosäulen führt. Wenn diese Annahme zutrifft, würde sich die Anisotropie der starken Wachstumsrate ändern, wenn das Ga/N-Verhältnis verbessert wird. Tatsächlich ist das GaN (S3 ) änderte sich die Struktur von der Nanosäule zum kompakten Film (Abb. 1e), wenn der Ga-Fluss auf 5,3 × 10 − 7 . erhöht wurde Torr. Daher kann das GaN-Wachstum in Form der Nanosäule oder des Kompaktfilms durch Einstellen des Ш/V-Verhältnisses gesteuert werden
Obwohl die GaN-Nanosäulen eine bessere Leistung als der Film aufweisen, ist die Herstellung einer elektrischen Vorrichtung sehr schwierig, da die getrennte Nanosäule vor der Herstellung des elektrischen Kontakts ausgerichtet werden muss. Eine elektrisch leitende Nanostruktur in der Ebene wird daher bevorzugt. Für das Wachstum von Probe S2 , wurde in der MBE-Wachstumskammer 40 s lang eine Vorabscheidung von metallischem Al durchgeführt. Dann die N2 Plasma und die Ga-Quelle wurden gleichzeitig geöffnet. Der Ga-Fluss für S2 das Wachstum ist in Tabelle 1 zusammengefasst, das gleiche wie das von S1 . Abbildung 1c zeigt das FESEM-Draufsichtsbild der Probe S2. Interessant ist, dass das GaN in Form des Nanowall-Netzwerks auf dem Al/Si (111) wächst. Die Nanowände mit einem Durchmesser von 50–100 nm überlappen und verflechten sich miteinander und bilden ein kontinuierliches Netzwerk in der Ebene, nämlich ein Nanowall-Netzwerk. Es sind zwei Klassen von Löchern zu beobachten, die als Klasse A und Klasse B bezeichnet werden. Die Durchmesser der Löcher der Klasse A und der Klasse B betragen typischerweise 50~100 bzw. 10~~49 nm. Die kontinuierliche Charakteristik in der Ebene macht das Nanowandnetzwerk in der Scheibe elektrisch leitfähig [18], wodurch die Hindernisse bei der Herstellung von Nanogeräten bis zu einem gewissen Grad beseitigt werden. Die obere Oberfläche der Nanowände ist relativ flach, anders als bei der facettierten GaN-Matrix, über die in Lit. berichtet wird. [13]. Es ist zu erkennen, dass sich die im Draufsichtbild gezeigten Löcher bis in die Nähe des Substrats erstrecken, wie durch das Rechteck in Abb. 1d angezeigt.
Man mag sich fragen, wie die oben erwähnten Löcher erzeugt werden. Wir haben eine Probe S5 gezüchtet bei einer niedrigeren Wachstumstemperatur von 900 K. Die anderen Wachstumsparameter sind bei der Probe S2 . gleich , wie in Tabelle 1 gezeigt. Aus Fig. 1g sehen wir, dass die Stichprobe S5 wuchs auch in Form des Nanowall-Netzwerks mit kleineren Löchern. Abbildung 1h ist das Querschnittsbild von S5 . , zeigt eine kompaktere Schicht als S2. Um das beginnende Wachstum des GaN-Nanowall-Netzwerks zu sehen, haben wir eine weitere Probe S4 . gezüchtet in kurzer Zeit mit Al-Vorabscheidung. Alle Wachstumsparameter von S4 sind die gleichen wie bei Probe S2 mit Ausnahme der Wachstumszeit (20 gegen 120 Minuten). Die Dicke von S4 etwa 50 nm beträgt und sein Draufsichtbild in Fig. 1f gezeigt ist. Es wird beobachtet, dass in diesem Stadium Löcher gebildet wurden und das GaN im Zustand ein kontinuierliches Netzwerk in der Ebene ist und nicht die GaN-Nanodrähte oder -Inseln. Aus der Untersuchung der Proben S1 , S2 , S4 , und S5 , ist klar, dass die Vorabscheidung der Al-Schicht das Wachstumsverhalten von GaN am Anfang verändert, von der Nanosäule zu dem in der Ebene liegenden kontinuierlichen Nanowandnetzwerk.
Beachten Sie, dass alle Wachstumsbedingungen von S2 außer dass die Vorablagerung von Al mit der von S1 . identisch ist . Dann können wir uns fragen, was die Struktur des vorher abgeschiedenen Al ist und wie es das nachfolgende Wachstum des GaN beeinflusst. Um diese Antworten zu finden, wird die Al-Vorabscheidung für 40 s auf dem blanken Si (111) von FESEM und AFM untersucht. Abbildung 2a zeigt das Draufsichtbild des vorab abgeschiedenen Al. Es wurde festgestellt, dass das Al auf dem Si-Substrat in Form von Tröpfchen (weißen Punkten) anders als als Film vorliegt. Die metallischen Al-Tröpfchen mit einer Dichte von ~ 4 × 10 7 mm − 2 relativ gleichmäßig ohne nennenswerte Akkumulation verteilen. Vor kurzem wurden die Al-Tröpfchen erfolgreich unter Verwendung von MBE von Li et al. um die Qualität des gewachsenen GaN zu verbessern und den Stress zu reduzieren [24]. Um die Morphologie der Al-Tröpfchen weiter zu untersuchen, wurde AFM verwendet, um ihre dreidimensionalen Bilder und die zugehörigen Parameter zu messen, wie in Abb. 2b, c gezeigt. Die Tröpfchen sind kugelförmig, wie in Abb. 2b gezeigt, in Übereinstimmung mit dem REM-Ergebnis. Die Höhe und der Durchmesser des gemessenen Al-Tröpfchens betragen 6,7 bzw. 80 nm. Poppitzet al. [25] haben das Wachstum eines GaN-Nanowandnetzwerks auf nacktem 6H-SiC (0001) durch eisenstrahlunterstützte MBE untersucht. Ihre Ergebnisse zeigen, dass die extrem N-reichen Wachstumsbedingungen in Kombination mit der hohen Substrattemperatur und der energetischen N-Ionen-Bestrahlung während des Wachstums die Hauptgründe für die Bildung des Nanowall-Netzwerks auf nacktem 6H-SiC (0001) sind. Als Pionier haben Kesaria et al. [17] haben das GaN-Nanowandnetzwerk auf einem reinen Saphirsubstrat mit PA-MBE untersucht. In ihrer Forschung wird davon ausgegangen, dass die GaN-Nanowände am Rand und den Schraubenversetzungen nukleieren und unter N-reicher Atmosphäre wachsen.
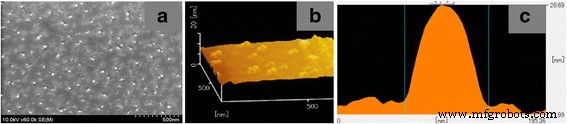
FESEM (a ) und AFM (b ) Bilder des zuvor abgeschiedenen Al auf einem Si-Substrat. c Eine Parametermessung eines Al-Tröpfchens durch AFM
In unserem Fall sollte der Wachstumsmechanismus des GaN-Nanowandnetzwerks ein anderer sein, da die Nanowände mit dem Erfordernis der metallischen Al-Vorabscheidung wachsen. Natürlich werden unseres Wissens alle GaN-Nanowandnetzwerke, einschließlich in unserem Experiment, unter der N-reichen Atmosphäre gezüchtet. N-reich ist erforderlich, um die Koaleszenz der Nanowände zu reduzieren. Konzentrieren wir uns nun auf die Rolle der Al-Tröpfchen bei der Bildung des Nanowandnetzwerks. Ähnlich wie bei den als Katalysator wirkenden Au-Tröpfchen [26] sollte das GaN, wenn die Al-Tröpfchen als Katalysator fungierten, zu den Nanosäulen und nicht zum Nanowandnetzwerk wachsen. Die Rolle der Al-Tröpfchen ist daher in unserer Studie kein Katalysator. Die Schmelztemperatur des Al-Metalls beträgt 933 K, während die Substrattemperatur während des Wachstums bei 973 K gehalten wird. Zu Beginn des GaN-Wachstums sind die Al-Tröpfchen somit Flüssigkeitströpfchen. Im Fall von GaN auf Si (111) mit Ga-Tröpfchen [13] fungieren laut früheren Berichten die Ga-Tröpfchen als Reservoire, die Ga-Atome in ihre unmittelbare Umgebung liefern. Die Ga-Tröpfchen selbst behindern jedoch das GaN-Wachstum auf ihnen, da die ursprünglichen Ga-Tröpfchen-Stellen hohle Kreise sind. In unserem Fall beträgt der Durchmesser der Al-Tröpfchen ~ 80 nm, ähnlich der Größe der Klasse-A-Löcher in Abb. 1a. Daher können die Al-Tröpfchen das Wachstum von GaN auf ihnen behindern, was zur Bildung von Klasse-A-Löchern führt, die im GaN-Nanowandnetzwerk beobachtet werden. Wegen des gleichen Ш/V-Verhältnisses der Proben S1 und S2 , die Ga-Diffusionslänge L für das Wachstum des Nanowandnetzwerks auf Si wird erwartet, dass es das gleiche ist wie das für die Nanosäulen. Die typische Größe des blanken Si-Substrats (der Bereich ohne Al-Tröpfchen) beträgt ~ 80 nm, innerhalb des Wertes des Nanosäulendurchmessers in Abb. 1a. Mit anderen Worten, die Ga-Diffusionslänge L bedeckt die Größe des blanken Si-Substrats, was zu einem kontinuierlichen Wachstum von GaN im Bereich ohne die Al-Tröpfchen führt, d. h. im GaN-Nanowandnetzwerk.
Basierend auf der obigen Analyse wird ein Wachstumsmodell des GaN-Nanowandnetzwerks vorgeschlagen und in Abb. 3 gezeigt. GaN bildet auf dem blanken Si-Substrat, wie in Abb. 3a dargestellt, Keime. Da die Gaab Diffusionslänge L bedeckt das blanke Si-Substrat, GaN wächst im gesamten blanken Si-Substrat, während das GaN-Wachstum über den Al-Tröpfchen behindert wird (Abb. 3b). Darüber hinaus neigt GaN unter N-reichen Bedingungen dazu, vertikal zu wachsen, wie in Fig. 3c gezeigt. Da das blanke Si-Substrat ein kontinuierliches Netzwerk in der Ebene ist, ist das Wachstum von GaN oben auch ein kontinuierliches Netzwerk, das als Nanowall-Netzwerk bezeichnet wird, wie in Fig. 3d dargestellt. Diese Annahme wird durch das Draufsichtbild der Probe S4 . bestätigt in Abb. 1f. Aufgrund der N-reichen Bedingung für die Probe S2 Wachstum ist das seitliche Wachstum so begrenzt, dass sich die Löcher im nachfolgenden Wachstum zurückhalten können. Beachten Sie, dass sowohl die Al-Tröpfchen als auch die N-reiche Bedingung für das Wachstum des GaN-Nanowandnetzwerks wesentlich sind.
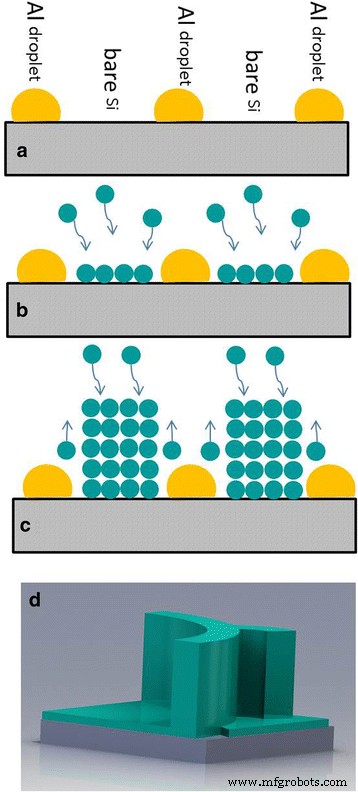
Wachstumsmodelle des GaN-Nanowall-Netzwerks. a Die zuvor abgeschiedenen Al-Tröpfchen auf dem Si-Substrat. b Nukleation des GaN-Nanowandnetzwerks auf dem bloßen Si. c Querschnittsdarstellung des vertikal gewachsenen GaN-Nanowandnetzwerks im N-reichen Zustand. d Neigungsdarstellung des GaN-Nanowall-Netzwerks
Röntgenbeugung wurde zur Charakterisierung der Kristallstruktur des GaN-Nanowandnetzwerks verwendet, wie in Abb. 4 gezeigt. Zwei Beugungspeaks von GaN(002) und GaN(004) werden zusammen mit dem Si (111)-Peak aus dem beobachtet Si-Substrat. Das Ergebnis zeigt, dass das GaN-Nanowandnetzwerk hexagonal ist und sich stark entlang C . orientiert Achse. Zusätzlich zum XRD-Muster wurde auch die ω-Scan-Rocking-Kurve von GaN(002) gemessen, wie im Einschub von Abb. 4 gezeigt. Die Halbwertsbreite beträgt 52,2 Arcmin, ähnlich dem vorherigen Bericht, der auf dem Saphir gewachsen ist Substrat [27]. Die elektrischen Eigenschaften wurden auch mit dem Van-der-Pauw-Hall-Messsystem (HL5500PC, Nanometrics) bei 293 K gemessen. Die elektrische Leitfähigkeit, die Hall-Mobilität und die Elektronenkonzentration des GaN-Nanowandnetzwerks betragen 10,2 S/cm, 31 cm 2 /Vs und 2,1 × 10 18 cm − 3 , bzw. Beim GaN-Film steigt die elektrische Leitfähigkeit aufgrund der höheren Elektronenkonzentration von 2,2 × 10 20 . auf 666,7 S/cm cm − 3 . Die hohe Ladungsträgerkonzentration im Film wird wahrscheinlich der hohen intrinsischen Defektkonzentration zugeschrieben, die durch das nicht optimierte Ga/N-Verhältnis erzeugt wird. Die Hallenmobilität des Films beträgt 18,7 cm 2 /Vs.

Röntgenbeugungsmuster des GaN-Nanowandnetzwerks (S2 ). Der Einschub ist die ω-Scan-Rocking-Kurve der Probe S2
Abbildung 5 zeigt die Photolumineszenzspektren des GaN-Nanowandnetzwerks mit einem He-Cd-Laser als Anregungsquelle. Gemäß dem Bericht von Kesaria et al. [17] wurde ein direkter Vergleich der Kathodolumineszenz zwischen GaN-Filmen, Nanowandnetzwerken und Nanosäulen, die auf bloßem Saphirsubstrat gewachsen sind, durchgeführt. Ihre Ergebnisse zeigen, dass die Bandkantenemission des Nanowandnetzwerks etwas höher ist als die der Nanosäule und viel höher als die des Films. Für das Nanowandnetzwerk ist eine breite Defektemission mit einem Zentrum bei 520 bis 620 zu beobachten, während für die Nanosäule keine Defektemission beobachtet werden konnte. In Abb. 5 wird eine starke Bandkantenemission mit einem Zentrum bei 363,7 nm mit einer Halbwertsbreite von 14,1 nm beobachtet. In guter Übereinstimmung mit dem Bericht von Kesaria et al. [17] ist im Bereich von 520 bis 620 nm eine breite grün-gelbe Emission, die Punktdefekten zugeschrieben wird [28] nachweisbar, aber sehr schwach, was auf eine hohe Qualität der GaN-Nanowand hindeutet Netzwerk. Daher ist die Lumineszenz des auf dem blanken Saphirsubstrat gewachsenen GaN-Nanowandnetzwerks und auf dem Si-Substrat mit den Al-Tröpfchen fast gleich, obwohl der Wachstumsmechanismus unterschiedlich ist.

Photolumineszenz (PL)-Spektren des GaN-Nanowandnetzwerks, gemessen bei Raumtemperatur
Schlussfolgerungen
In dieser Arbeit wurde eine Strukturverschiebung des GaN-Wachstums zwischen der Nanosäule, dem Nanowandnetzwerk und dem kompakten Film auf Si(111)-Substrat mit MBE erfolgreich erreicht. Die GaN-Nanosäulen wurden auf dem blanken Si-Substrat unter N-reichen Bedingungen gezüchtet, während der Kompaktfilm mit einem verbesserten Ga-Fluss gezüchtet wurde. Durch Hinzufügen einer vorab abgeschiedenen Al-Schicht verschiebt sich das Wachstum von GaN von den Nanosäulen zu dem in der Ebene liegenden kontinuierlichen Nanowandnetzwerk. Die vorab abgeschiedene Al-Schicht liegt in Form von Tröpfchen mit einer typischen Höhe und einem typischen Durchmesser von 6,7 bzw. 80 nm vor. Der Wachstumsmechanismus des Nanowall-Netzwerks wird angesprochen. GaN wächst kontinuierlich auf dem blanken Si-Substrat, während das GaN-Wachstum auf den Al-Tröpfchen behindert wird, was zur Bildung des Nanowandnetzwerks führt. Sowohl Al-Tröpfchen als auch N-reiche Bedingungen sind für das Wachstum des Nanowandnetzwerks wesentlich.
Nanomaterialien
- C# Bitwise- und Bit-Shift-Operatoren
- C Struktur und Funktion
- Team Chemie und Industrie 4.0
- 5G und GaN:Der Wechsel von LDMOS zu GaN
- 5G und GaN:Innovationen der Zukunft
- IoT und Blockchain – Ein Paradigmenwechsel
- Unterschied zwischen Struktur und Union
- Enthüllung der atomaren und elektronischen Struktur von gestapelten Kohlenstoff-Nanofasern
- Struktur und elektronische Eigenschaften von übergangsmetalldotiertem Kaolinit-Nanoton
- Infrarotreflexionsanalyse von epitaktischen n-dotierten GaN-Schichten, die auf Saphir gewachsen sind



