Eine theoretische Simulation des Strahlungsverhaltens von Si-, Ge- und Si/Ge-Übergittern auf niederenergetische Bestrahlung
Zusammenfassung
In dieser Studie werden die niederenergetischen Strahlungsantworten von Si-, Ge- und Si/Ge-Übergittern mit einer Ab-initio-Molekulardynamikmethode untersucht und die Ursprünge ihres unterschiedlichen Strahlungsverhaltens erforscht. Es wurde festgestellt, dass der Strahlungswiderstand der Ge-Atome, die sich um die Grenzfläche des Si/Ge-Übergitters befinden, mit massivem Ge vergleichbar ist, während die Si-Atome um die Grenzfläche herum schwieriger zu verdrängen sind als die des massiven Si, was eine verbesserte Strahlungstoleranz zeigt, da verglichen mit dem Bulk-Si. Die Mechanismen der Defekterzeugung in den Volumen- und Übergitterstrukturen weisen einen etwas anderen Charakter auf, und die zugehörigen Defekte im Übergitter sind komplexer. Defektbildungs- und Migrationsrechnungen zeigen, dass in der Übergitterstruktur die Punktdefekte schwieriger auszubilden sind und die Leerstellen weniger beweglich sind. Die verbesserte Strahlungstoleranz des Si/Ge-Übergitters wird für seine Anwendungen als elektronische und optoelektronische Geräte in einer Strahlungsumgebung von Vorteil sein.
Hintergrund
In den letzten Jahrzehnten hat das Si/Ge-Übergitter (SL) aufgrund seines potenziellen Beitrags zur Entwicklung neuer elektronischer und optoelektronischer Bauelemente [1,2,3,4,5,6] viel Aufmerksamkeit in der Halbleiterforschung auf sich gezogen. Beispielsweise ist die Untersuchung der Photoleitfähigkeit von Si/Ge SL für Photodioden als Sender und Empfänger für schnelle optische Kommunikation von bemerkenswerter Bedeutung [5]. In Anwendungen wie der Weltraumelektronik, der Mikroelektronik, der Solarzelle und der Weltraumelektronik [1, 4, 6] können die optischen und elektronischen Eigenschaften von Si/Ge SL durch den Beschuss von hoch- Energieionen aus der Weltraumumgebung, was zu einer Leistungsverschlechterung der elektronischen Geräte führt. Daher ist es notwendig, das Strahlungsverhalten dieses Halbleitermaterials unter extremen Arbeitsbedingungen zu untersuchen.
Kürzlich haben viele Forscher die Strahlenschäden von Si/Ge-Übergittern untersucht [7,8,9,10,11,12,13,14,15,16]. Sobolewet al. untersuchten die Einflüsse von Elektronenbestrahlung auf die Photolumineszenz (PL) von Si/Ge-SL, die eine Monoschicht aus reinem Ge enthielten, und fanden eine verbesserte Strahlungsbeständigkeit der SL-Struktur im Vergleich zu Bulk-Silizium [12]. Fonsecaet al. bestrahlten die Si/Ge-SL mit eingebetteten Ge-Quantenpunkten (QDs) unter Verwendung der 2,0 MeV-Protonenbestrahlung und fanden eine außergewöhnlich hohe Strahlungsbeständigkeit der QD-in-SL-Struktur [13]. Ähnliche Ergebnisse wurden von Leitão et al. erzielt, die berichteten, dass die auf einer Diodenstruktur mit einer Si/Ge-Mehrschichtstruktur abgeschiedenen Ge-Quantentöpfe (QWs) im Vergleich zu den einzelnen Ge-QWs widerstandsfähiger gegenüber der Protonenbestrahlung waren [14]. Als vielversprechende thermoelektrische Materialien können die thermoelektrischen Eigenschaften des Si/Ge-Systems auch unter der Strahlungsumgebung beeinflusst werden [11, 15]. Zhenget al. bestrahlte die mehreren periodischen Schichten von Si1 − x Ge x /Si mit 5 MeV Si-Ionen, und sie fanden heraus, dass die thermoelektrische Gütezahl mit zunehmender Si-Ionen-Flussigkeit zunimmt [11]. Die Defekte und die strukturelle Unordnung reduzieren die Wärmeleitfähigkeit über die Kreuzebene, indem sie Phononen entlang des Gitters absorbieren und dissipieren, und die elektronische Zustandsdichte im Miniband der QD-Struktur erhöht die elektrische Leitfähigkeit und den Seebeck-Koeffizienten, die alle zur Erhöhung der Zahl beitragen von Verdienst [11].
Theoretisch untersuchten Sayed und Windl beide die atomaren Verschiebungen von massivem Si mit der klassischen Molekulardynamik (MD)-Methode [17, 18]. Sie fanden heraus, dass die Schwellenverschiebungsenergien (Ed s) hängen von der Knock-On-Richtung ab und die beschädigten Zustände sind hauptsächlich Frenkel-Paar-(FP)-Defekte [17, 18]. Caturla et al. untersuchten die Auswirkungen von Ionenmasse und -energie auf die Strahlungsschädigung von Bulk-Si mit der MD-Methode [19]. Sie berichteten, dass die Erzeugung von Amorphisierung sowie isolierte Punktdefekte und kleine Cluster eine starke Abhängigkeit von der Ionenmasse und eine schwache Beziehung zur Ionenenergie aufweisen [19]. Holmström et al. berechnet den Ed s für Germanium mit der MD-Methode und fanden heraus, dass die stabilen Defekte FP-Defekte sind [20]. Shawet al. wandten eine Ab-initio-Methode an, um die Auswirkungen von Antimon- und Germaniumdefekten auf die elektronische Struktur von Si/Ge-Heterostrukturen zu untersuchen und fanden heraus, dass diese Defekte mit den Si/Ge-Grenzflächen wechselwirken, was zu grenzflächenbezogenen lokalisierten Resonanzen und großen lokalen Störungen der elektronischen Struktur [21]. Trotz dieser erwähnten Untersuchungen wurden in der Literatur bisher keine theoretischen Simulationen des dynamischen Prozesses der Strahlenschädigung von Si/Ge SL berichtet. Es fehlt noch immer ein Verständnis der mikrostrukturellen Entwicklung und des zugrunde liegenden Mechanismus der Defekterzeugung in den Halbleiter-Übergittern auf atomarer Ebene.
Die Methode der Ab-initio-Molekulardynamik (AIMD) hat sich als wichtiges Werkzeug zur Aufklärung der Strahlungsschädigungsprozesse erwiesen und war tatsächlich erfolgreich bei der Simulation der Rückstoßereignisse einer Reihe von Halbleiter- und Keramikmaterialien [22,23,24, 25,26,27]. Im Vergleich zur klassischen MD-Methode werden die interatomaren Potentiale aus Elektronenstrukturrechnungen und nicht aus empirischen Anpassungen experimenteller Ergebnisse gewonnen. Folglich sind viele physikalische Parameter wie Ed s kann mit Ab-initio-Genauigkeit bestimmt werden. In dieser Studie wird die AIMD-Methode verwendet, um das Ansprechverhalten von Bulk-Si, Ge und Si/Ge-SL unter niederenergetischer Bestrahlung zu vergleichen. Die Schwellenverschiebungsenergien wurden bestimmt und die Defektverteilung und der Pfad zur Defekterzeugung wurden bereitgestellt. Der mögliche Ursprung für die Diskrepanz in der Strahlungstoleranz zwischen Bulk-Si (Ge) und Si/Ge-SL wird ebenfalls untersucht. Die präsentierten Ergebnisse bieten einen grundlegenden Einblick in den mikroskopischen Mechanismus von Verschiebungsereignissen in Bulk-Si, Ge und Si/Ge SL und fördern das Verständnis der Strahlungsreaktionen dieser Materialien in einer Strahlungsumgebung.
Methoden
Die niederenergetischen Verschiebungsereignisse von Si, Ge und Si/Ge SL werden von der spanischen Initiative für elektronische Simulationen mit Tausenden von Atomen (SIESTA) simuliert. Die normerhaltenden Troullier-Matrins-Pseudopotentiale [28] werden verwendet, um die Wechselwirkung zwischen Ionen und Elektronen zu bestimmen, und das Austauschkorrelationspotential wird durch die Local-Density-Approximation (LDA) in der Ceperly-Alder-Parametrisierung [29] beschrieben. Die Valenzwellenfunktionen werden um einen Basissatz lokalisierter Atomorbitale erweitert, und es werden Einzel-ζ-Basissätze plus Polarisationorbital (SZP) verwendet, mit einer K-Punkt-Abtastung von 1 × 1 × 1 in der Brillouin-Zone und einem Schnitt- Ausschaltenergie von 60 Ry. In der vorliegenden Studie wurde ein Si2 /Ge2 Betrachtet wird SL, das aus zwei Schichten Si im Wechsel mit zwei Schichten Ge und insgesamt 288 Atomen besteht. Abbildung 1 veranschaulicht die geometrische Konfiguration für Bulk-Si und Si/Ge-SL. Ein bestimmtes Atom wird als primäres Knock-On-Atom (PKA) ausgewählt und erhält eine kinetische Energie, um einen Rückstoß auszulösen. Wenn die PKA am Ende des Verschiebungsereignisses in ihre ursprüngliche Position zurückkehrt, wird die Simulation mit einer höheren Rückstoßenergie mit einem Energieinkrement von 5 eV neu gestartet. Sobald die PKA dauerhaft von ihrer Gitterstelle verdrängt ist, werden zusätzliche Durchläufe durchgeführt, um die Präzision auf 0,5 eV zu verbessern. Für jeden Atomtyp werden vier bzw. fünf Haupteinfallsrichtungen für Bulk-Si (Ge) bzw. Si/Ge SL berücksichtigt. Die Simulationen werden mit einem NVE-Ensemble durchgeführt und die maximale Dauer jedes Laufs beträgt 1,2 ps, um die Instabilität des Systems zu vermeiden.

Schematische Darstellung der geometrischen Strukturen von a Bulk-Si und b Si/Ge-Übergitter. Die blauen und grünen Kugeln repräsentieren die Si- bzw. Ge-Atome
Ergebnisse und Diskussion
Die Verdrängungsereignisse in Bulk-Silizium und Germanium
Die Gitterkonstante von Bulk-Si wird zu 5,50 Å bestimmt, was gut mit dem theoretischen Ergebnis von 5,48 Å [30] und dem experimentellen Ergebnis von 5,43 Å [31] übereinstimmt. Im Vergleich zu massivem Si ist die Gitterkonstante von massivem Ge größer, d. h. 5,71 Å, was mit dem berechneten Ergebnis von 5,65 Å [30] und dem experimentellen Wert von 5,77 Å [31] übereinstimmt. Unsere berechneten Schwellenverschiebungsenergien für massives Si und Ge sind in Tabelle 1 zusammengefasst, zusammen mit den zugehörigen Defekten nach den Verschiebungsereignissen. Die Konfigurationen für die Schadensendzustände von Si- und Ge-Rückstößen sind in den Fig. 1 und 2 aufgetragen. 2 bzw. 3.

a –d Schematische Darstellung der geometrischen Strukturen des Schadens Si nach Rückstoßereignissen. Die grünen und roten Kugeln repräsentieren die Leerstelle bzw. die Zwischengitterdefekte. VSi :Silizium-Leerstelle; Siint :Silizium-Zwischengitter

a –d Schematische Darstellung der geometrischen Strukturen des Schadens Ge nach Rückstoßereignissen. Die roten und blauen Kugeln repräsentieren die Leerstelle bzw. die Zwischengitterdefekte. VGe :Germanium-Leerstelle; Geint :Germanium-Zwischengitter
Für Bulk-Si ist das E d Werte sind etwas kleiner als die experimentellen Ergebnisse von 21 eV für [001] [32], ~ 47,6 eV für [110] [33] und ~ 12,9 eV für [111] [34]-Richtungen, und sowohl das Experiment als auch unsere Berechnungen zeigen, dass die beschädigten Endzustände Frenkel-Paar-(FP)-Defekte sind. Es wird auch darauf hingewiesen, dass E d Werte in der vorliegenden Studie sind im Allgemeinen mit den MD-Ergebnissen vergleichbar, die von Windl et al. [18], außer im Fall von [110], für den unser berechneter Wert von 47 eV viel größer ist als das MD-Ergebnis von 24 eV. Frühere AIMD-Simulationen von Ionen-Feststoff-Wechselwirkungen in SiC zeigten, dass das Verschiebungsereignis tatsächlich ein Ladungstransferprozess ist und der Ladungstransfer zu und von rückstoßenden Atomen die Energiebarrieren und die Dynamik für eine stabile Defektbildung verändern kann [35]. Die niedrigeren Werte von E d von AIMD im Vergleich zu denen, die durch klassische MD bestimmt wurden, kann daran liegen, dass der Ladungstransfer, der während der Rückstoßereignisse stattfindet, von der AIMD-Methode berücksichtigt wird, während in der klassischen MD-Simulation die Ladung der Atome fixiert ist. In der Studie von Windl et al. wird die kinetische Energie auf die PKA übertragen, um eine Silizium-Leerstelle (VSi ) und ein Silizium-Zwischengitter (Siint ) Defekte [18]. Im Gegensatz dazu enthalten in unserer Studie die zugehörigen Defekte für das Si[110]-Verdrängungsereignis zwei VSi und zwei Siint Defekte, was zu höheren Energien für die Bildung der beschädigten Zustände führt. Das E d Werte für Si[111] und Si\(\left[\overline{1}\overline{1}\overline{1}\right]\) liegen sehr nahe beieinander, d. h. 9,5 bzw. 10 eV. In beiden Fällen sind die erzeugten Defekte VSi und Siint (siehe Abb. 2c, d), während die Mechanismen der Defekterzeugung einen anderen Charakter aufweisen. Im Fall von Si[111] bewegt sich die Si-PKA aufgrund der abstoßenden Wechselwirkungen entlang der \(\left[11\overline{1}\right]\)-Richtung und kollidiert mit ihrem benachbarten Si-Atom. Die Si-PKA zerstreut sich dann, um eine Zwischengitterstelle zu besetzen (Siint ), und das ersetzte Si wandert zurück zum Gitterplatz von PKA. Die zugehörigen Defekte sind ein VSi und ein Siint Mängel. Was Si\(\left[\overline{1}\overline{1}\overline{1}\right]\) angeht, ist das Verschiebungsereignis relativ einfacher, dh die Si-PKA bewegt sich 4.69 Å von ihrem Gitterplatz weg nach Bilde ein Siint Defekt. Im Fall von Si[001] und Si[110] beträgt der Ed s werden mit 20 bzw. 47 eV bestimmt, was darauf hindeutet, dass die Si-Atome schwieriger entlang der [110]-Richtung verschoben werden können. Die Schadensendzustände für Si[001] und Si[110] sind etwas unterschiedlich. Im Fall von Si[001] erhält die PKA kinetische Energie und bewegt sich entlang der [001]-Richtung, um mit ihren Nachbaratomen zu kollidieren. Das ersetzte Si-Atom bewegt sich weiter und besetzt eine Zwischengitterstelle, wie in Abb. 2a gezeigt. Was Si[110] betrifft, streut die PKA aufgrund der abstoßenden Wechselwirkungen zwischen der PKA und ihren Nachbaratomen in Richtung \(\left[11\overline{1}\right]\) und trifft auf ein benachbartes Si-Atom (Si1) . Dann prallt die Si-PKA in Richtung [111] zurück, um ein weiteres Si-Atom (Si2) zu ersetzen, und das Si2-Atom besetzt am Ende eine Zwischengitterstelle. Das Si1-Atom erhält genügend Energie, um sich entlang der [110]-Richtung zu bewegen und ersetzt sein benachbartes Si-Atom (Si3), das einen Zwischengitterdefekt bildet. Am Ende sind die zugehörigen Defekte zwei VSi und zwei Siint Defekte, wie in Abb. 2b gezeigt.
Für Bulk-Ge sind die Werte von E d stimmen gut mit dem experimentellen Wert von ~ 18 eV [36] und dem theoretischen Wert von 18,5 eV [20] für die Richtung [001] überein. Es ist anzumerken, dass der Barwert von 9,5 eV mit dem Holmström-Ergebnis von 12,5 eV [20] für [111]-Richtung vergleichbar ist, das kleiner ist als der experimentelle Wert von ~ 15 eV [36]. Für Ge[111] und Ge\(\left[\overline{1}\overline{1}\overline{1}\right]\) ist das ermittelte E d Werte sind nur 9,5 eV, was darauf hindeutet, dass die Ge-Atome leicht in diese beiden Richtungen verschoben werden können. In beiden Fällen sind die zugehörigen Defekte Germanium-Leerstellen und Germanium-Zwischengitter (siehe Abb. 3c, d). Für Ge\(\left[\overline{1}\overline{1}\overline{1}\right]\) folgt die Ge-PKA keinem geraden Weg, sondern wird von einem ihrer nächsten Nachbarn stark abgelenkt eine Interstitial-Site (Geint ). Im Gegensatz dazu bewegt sich im Fall von Ge[111] die Ge-PKA um 4,92 Å entlang der [111]-Richtung, um einen Zwischengitterdefekt (Geint ). Im Vergleich zum E d von Ge[001] ist der Wert von Ge[110] 10 eV größer, was darauf hinweist, dass das Ge-Atom schwieriger entlang der [110]-Richtung verschoben werden kann. Obwohl die zugehörigen Defekte für Ge[001] und Ge[110] ähnlich sind, unterscheiden sich die Mechanismen der Defekterzeugung etwas. Die Ge-PKA empfängt kinetische Energie und bewegt sich entlang der [001]-Richtung, um mit ihren Nachbaratomen zu kollidieren. Das ersetzte Ge-Atom bewegt sich weiter und besetzt eine Zwischengitterstelle, wie in Abb. 3a gezeigt. Bei Ge[110] kollidiert der Ge-Rückstoß mit seinem ersten benachbarten Ge-Atom (Ge1) in [110]-Richtung und prallt in [111]-Richtung zurück, was zur Bildung von Geint . führt . Das Ge1-Atom verlässt seinen Gitterplatz und ersetzt sein benachbartes Ge-Atom (Ge2). Anschließend wandert das Ge2-Atom zurück auf den Gitterplatz von Ge1 und schließlich nur noch ein VGe und ein Geint Defekte werden gebildet, wie in Abb. 3b gezeigt. Diese Ergebnisse legen nahe, dass in Bulk-Si und Ge die Ed s hängen stark von der kristallographischen Richtung ab, und die Atome sind schwieriger entlang der [110]-Richtung zu verschieben. Die Endzustände der Strahlungsschädigung in Bulk-Si und Ge sind hauptsächlich FP-Defekte, d. h. Leerstellen und Zwischengitterdefekte.
Die Verschiebungsereignisse im Si/Ge-Übergitter
In dieser Studie wurden die Verschiebungsereignisse von Si2 /Ge2 SL, die zwei Schichten aus Si im Wechsel mit zwei Schichten aus Ge enthält (siehe Abb. 1b), werden berücksichtigt. Als PKA werden die an die Si/Ge-Grenzfläche angrenzenden Si- und Ge-Atome ausgewählt. Die Ed s für Si- und Ge-Rückstöße und die zugehörigen Defekte sind in Tabelle 2 aufgeführt. Die Defektkonfigurationen für Si- und Ge-Rückstöße sind in den Abb. 4 bzw. 5. Es sei darauf hingewiesen, dass im Fall von Si[111] selbst bei Energien bis zu 100 eV keine Defekte erzeugt werden. Aufgrund der rechnerischen Einschränkungen haben wir keine weiteren Simulationen von Rückstoßereignissen bei Energien über 100 eV und dem genauen E . durchgeführt d Wert für Si[111] ist nicht bestimmt.

a –d Schematische Ansicht der geometrischen Strukturen des beschädigten Si/Ge-Übergitters nach Si-Rückstoßereignissen. Die blauen und grünen Kugeln repräsentieren die Si- bzw. Ge-Atome. V X :X Stellenangebot (X = Si oder Ge); X int :X Interstitial (X = Si oder Ge); X J :X das Y besetzen Gitterplatz (X und J = Si oder Ge). Die violetten und roten Kugeln stellen die Leerstelle bzw. die Zwischengitterdefekte dar
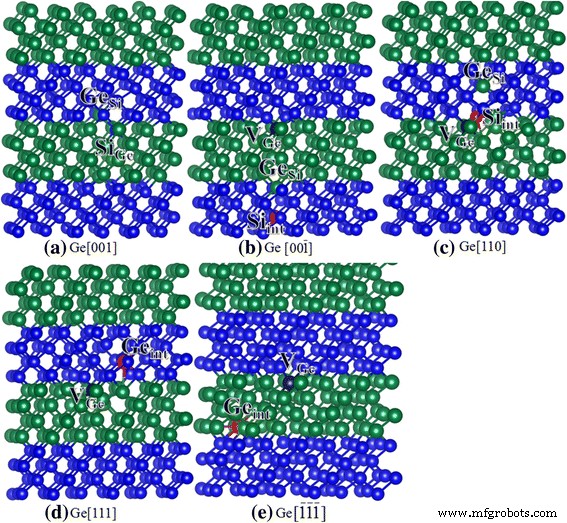
a –e Schematische Ansicht der geometrischen Strukturen des beschädigten Si/Ge-Übergitters nach Ge-Rückstoßereignissen. Die blauen und grünen Kugeln repräsentieren die Si- bzw. Ge-Atome. V X :X Stellenangebot (X = Si oder Ge); X int :X Interstitial (X = Si oder Ge); X J :X das Y besetzen Gitterplatz (X und J = Si oder Ge). Die violetten und roten Kugeln stellen die Leerstelle bzw. die Zwischengitterdefekte dar
In der Si/Ge-SL-Struktur lässt sich die Si-PKA leicht entlang der \(\left[\overline{1}\overline{1}\overline{1}\right]\)-Richtung verschieben, wie durch die kleines E d Wert von 10 eV. Der Weg zur Defekterzeugung ist sehr einfach, d. h. die Si-PKA bewegt sich 4,61 Å von ihrem Gitterplatz weg und bildet ein Siint Defekt. Für Si[001] und Si\(\left[00\overline{1}\right]\) ist Ed s werden mit 46,5 bzw. 42,5 eV bestimmt und die beschädigten Defekte unterscheiden sich wie erwartet. Im Fall von Si[001] bewegt sich der Si-PKA entlang der [001]-Richtung, um sein benachbartes Ge-Atom (SiGe ) und das ersetzte Ge-Atom kollidiert mit seinem benachbarten Si-Atom und besetzt dessen Gitterplatz, wodurch ein GeSi . gebildet wird Antisite-Defekt. Das ersetzte Si-Atom erhält ausreichend Energie und ersetzt weiter ein anderes Ge-Atom (SiGe ), die schließlich eine Zwischengitterstelle einnimmt. Schließlich sind die zugehörigen Defekte eins VSi , ein Geint , und drei Antisite-Defekte. Wie bei Si\(\left[00\overline{1}\right]\), sind auch zwei benachbarte Ge-Atome und ein benachbartes Si-Atom an dem Verschiebungsereignis beteiligt, und die beschädigten Zustände enthalten zwei Leerstellen, zwei Zwischengitter und zwei Antisite-Defekte, wie in Abb. 4b gezeigt. Im Fall von Si [110] bewegt sich das Si-Atom, um auf sein benachbartes Si-Atom zu treffen und streut in Richtung \( \left[11\overline{1}\right]\). Dann ersetzt die Si-PKA ein benachbartes Ge-Atom, das am Ende einen Zwischengitterplatz einnimmt. Nach den Verschiebungsereignissen enthalten die zugehörigen Defekte ein VSi , ein SiGe, und ein Geint Mängel. Verglichen mit dem Volumen-Si sind die Si-Atome in Si/Ge SL im Allgemeinen schwieriger zu verdrängen, außer im Fall von [110] und die Mechanismen der Defekterzeugung sind komplexer, was darauf hindeutet, dass das Volumen von Si und Si/Ge SL unterschiedliche Strahlungsreaktionen auf Bestrahlung. Unsere Ergebnisse stimmen mit den Experimenten von Fonseca et al. und Leitão et al. [13, 14], die auch feststellten, dass die Strahlungsresistenz der SL-Struktur im Vergleich zu massivem Silizium erhöht war.
Für Ge-Rückstöße in Si/Ge SL sind die Ge-Atome leicht entlang der [111]- und \(\left[\overline{1}\overline{1}\overline{1}\right]\)-Richtungen zu verschieben, die den Ge-Rückstoßereignissen in der Masse von Ge ähnlich sind. Obwohl die Endzustände der Strahlenschäden für Ge[111] und Ge\(\left[\overline{1}\overline{1}\overline{1}\right]\) sehr ähnlich sind, dh Ge-FP-Defekte, sind die Mechanismen der Fehlererzeugung sind unterschiedlich. Im Fall von Ge[111] bewegt sich die Ge-PKA 4,77 Å von ihrem Gitterplatz weg und bildet ein Geint . Defekt. Für die Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \) bewegt sich das Ge-Atom entlang der \( \left[\overline{1}\overline{1} \overline{1}\right] \) Richtung, um sein benachbartes Ge-Atom zu ersetzen. Das kollidierte Ge-Atom bewegt sich entlang dieser Richtung und nimmt am Ende einen Zwischengitterplatz ein. Es wird darauf hingewiesen, dass die Ed Werte von 16 eV für Ge[001] und 17,5 eV für Ge\(\left[00\overline{1}\right]\) sind vergleichbar mit dem Wert von 18 eV für Ge[001] in Bulk-Ge, während die zugehörigen Defekte zeigen unterschiedlichen Charakter. Im Fall von Ge[001] erhält die Ge-PKA ausreichend Energie, streut jedoch entlang der [111]-Richtung, um ihr benachbartes Si-Atom zu ersetzen, wodurch ein GeSi . gebildet wird Antisite-Defekt. Dann besetzt das ersetzte Si-Atom den Ge-PKA-Gitterplatz und bildet einen Antiplatz-Defekt (SiGe ). Im Fall von Ge\(\left[00\overline{1}\right]\) bewegt sich die Ge-PKA 5,63 Å weg, um ihr benachbartes Si-Atom zu ersetzen. Das Si-Atom bewegt sich entlang dieser Richtung und bildet ein Siint Defekt. Im Vergleich zu Ge[110] in Bulk-Ge ist das Ed für Ge[110] in Si/Ge SL ist 8,5 eV kleiner und die zugehörigen Defekte sind komplexer, wie durch ein VGe . angezeigt , ein GeSi , und ein Siint Mängel. Beim Vergleich der Ge-Rückstoßereignisse in Bulk-Ge und SL stellen wir fest, dass die Ge-Atome in Si/Ge-SL entlang der [110]-Richtung widerstandsfähiger sind. Für andere Verschiebungsereignisse ist der Ed s sind im Allgemeinen mit denen für Bulk-Zustände vergleichbar. Die Endzustände der Strahlungsschädigung in Bulk-Ge und Si/Ge-SL sind jedoch unterschiedlich, und einige Anti-Site-Defekte werden in der Si/Ge-SL-Struktur erzeugt. Diese Ergebnisse legen nahe, dass die Ge-Rückstöße in der Si/Ge-SL-Struktur unterschiedliche Strahlungsreaktionen auf Bestrahlung zeigen. Beim Vergleich der Rückstöße von Si und Ge in der SL-Struktur stellen wir fest, dass die Verschiebungsereignisse von Si-Atomen viel stärker beeinflusst werden als die von Ge, d. h. das Ed s für Si-Atome in der SL-Struktur sind im Allgemeinen erhöht, was zu einer erhöhten Strahlungsbeständigkeit von Si/Ge-SL führen kann. Sobolewet al. haben herausgefunden, dass die Si/Ge-SLs eine außergewöhnlich hohe Strahlungshärte im Vergleich zu massivem Si aufweisen [12], was mit unseren Ergebnissen übereinstimmt.
Die Defektbildungsenergie- und Migrationsbarriere in Bulk-Si-, Ge- und Si/Ge-Übergittern
In Bulk-Si und Ge sind die beschädigten Zustände hauptsächlich Leerstellen und Zwischengitterdefekte. Was Si/Ge SL angeht, enthalten die zugehörigen Defekte Leerstellen, Zwischengitter- und Antistellendefekte, und die Mechanismen der Defekterzeugung sind im Allgemeinen komplexer. Die Diskrepanz in der Resistenz gegen Defektbildung zwischen Bulkkomponentenmaterialien und Si/Ge SL kann in ihren unterschiedlichen Strahlungstoleranzen resultieren. Um den Ursprung des unterschiedlichen Strahlungsverhaltens dieser Halbleitermaterialien weiter zu untersuchen, berechnen wir die Bildungsenergien von Leerstellen, Zwischengitter- und Antisite-Defekten in Volumenzuständen und SL-Strukturen sowie die Migrationsbarriere der günstigsten Defekte mit Hilfe von Dichtefunktionaltheorie-Methoden. Die Berechnungen basieren auf einer Superzelle bestehend aus 64 Atomen mit einer 6 × 6 × 6 k-Punkt-Abtastung im Realraum und einer Grenzenergie von 500 eV.
Die Defektbildungsenergien in Bulk-Si, Ge und Si/Ge SL sind in Tabelle 3 zusammen mit anderen berechneten Ergebnissen aufgeführt. In Bulk-Si sind die Bildungsenergien für VSi , Siint , und Si-FP-Defekte werden mit 3,60, 3,77 bzw. 4,62 eV berechnet, was in vernünftiger Übereinstimmung mit anderen Berechnungen ist [37,38,39,40]. Unsere Ergebnisse zeigen, dass VSi Defekte lassen sich leichter in Bulk-Si erzeugen. Ebenso die VGe Defekt in Bulk-Ge ist energetisch günstiger als der Geint und Ge-FP-Defekte, wie durch die kleinste Defektbildungsenergie von 2,23 eV angezeigt, die gut mit dem theoretischen Wert von 2,09 eV vergleichbar ist [39]. Was die Si/Ge-SL betrifft, so ist die Bildungsenergie von VGe wird mit 2,73 eV bestimmt, was kleiner ist als die Bildungsenergien anderer Defekte. Der nächste günstige Defekt ist der VSi Defekt und die Formationsenergie wird mit 2,85 eV bestimmt. Es wird darauf hingewiesen, dass der Wert von 3,52 eV für Geint kleiner als der Wert von 3,77 eV für Siint . ist Defekt. Bei FP-Defekten ist die Bildungsenergie offensichtlich größer, d. h. 5,19 eV für Si-FP und 5,01 eV für Ge-FP, was darauf hindeutet, dass die FP-Defekte schwer zu erzeugen sind. Im Vergleich zu den Volumenzuständen sind die Defektbildungsenergien für die Si/Ge-SL-Struktur im Allgemeinen größer, mit Ausnahme der Defekte von VSi und Siint , was darauf hinweist, dass in der SL-Struktur die Punktdefekte im Allgemeinen schwieriger zu bilden sind. Eine solche Diskrepanz in der Beständigkeit gegen Defektbildung zwischen Bulk-Zuständen und der Si/Ge-SL-Struktur kann zu unterschiedlichen Reaktionen auf Bestrahlung führen.
Basierend auf den optimierten Strukturen ist das Migrationsverhalten der VGe und VSi Defekte, die die günstigsten Defekte in Bulk- und Si/Ge-SL-Strukturen sind, werden weiter untersucht. Die VGe und VSi Defekte, die an die Si/Ge-Grenzfläche angrenzen, werden berücksichtigt, und die Migrationsbarrieren sind in Tabelle 4 zusammengefasst. Es wird darauf hingewiesen, dass die Migrationsbarrieren entlang der [100]- und [110]-Richtungen für VGe Defekte sind kleiner als bei VSi Defekte und die Energiebarriere für VGe Migration entlang der [111]-Richtung ist etwas größer als bei VSi Migration, die mit den Ergebnissen von Cowern et al. [41].
Die Energielandschaften der Defektmigration entlang der Richtungen [100], [110] und [111] sind in Abb. 6 aufgetragen. In Abb. 6a sind die Migrationsbarrieren des VSi Defekte entlang der [100]-Richtung werden mit 4,32 und 3,92 eV in Bulk-Si bzw. Si/Ge-SL bestimmt. Was die [110]-Richtung betrifft, ist die Migrationsbarriere von 2,14 eV für VSi in der Si/Ge-SL-Struktur liegt sehr nahe am Wert von 2,12 eV in Bulk-Si. Beim Vergleich der Migrationsbarrieren entlang jeder Richtung stellen wir fest, dass die [111]-Richtung die günstigste Migrationsrichtung sowohl für Si- als auch für Ge-Leerstellen ist, wie die deutlich kleineren Migrationsbarrieren zeigen. Insbesondere die VSi Defekte wandern in Bulk-Si leichter entlang der [111]-Richtung als in Si/Ge-SL, da die Energiebarriere von 0.11 eV im Bulk-Zustand viel kleiner ist (siehe Abb. 6e). Was die VGe betrifft Defekte werden die Migrationsbarrieren entlang der [100]-Richtung zu 3,67 eV in Bulk-Ge und 2,87 eV in Si/Ge-SL berechnet. Im Fall der [110]-Richtung werden die Energiebarrieren in der Bulk- bzw. SL-Struktur mit 1,94 und 1,39 eV bestimmt. Ähnlich wie bei der Si-Leerstellenmigration ist die VGe Defekte sind leichter entlang der [111]-Richtung zu wandern. Außerdem erfolgt die Migration leichter in Bulk-Ge als in Si/Ge-SL, wie in Fig. 6f gezeigt. Unsere Berechnungen legen nahe, dass sowohl Si- als auch Ge-Leerstellen im Volumenzustand beweglicher sind als die SL-Struktur, was zur Bildung von Hohlräumen und sogar zur Volumenquellung führen kann. Dies kann zu unterschiedlichen Reaktionen auf die Bestrahlung der Volumen- und SL-Strukturen beitragen.
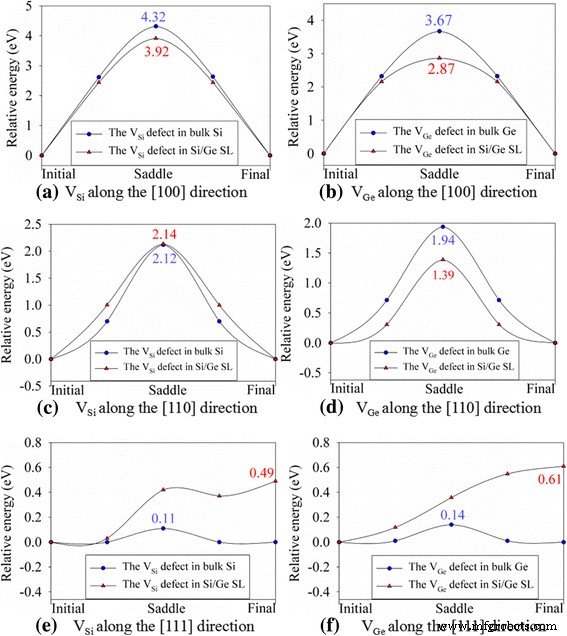
Die Migrationsbarriere der Silizium-Leerstelle (VSi ) und Germanium-Leerstelle (VGe ) Defekte, die durch eine Cluster-Nudged-Elastic-Band-Methode erhalten wurden. a VSi entlang der Richtung [100]; b VGe entlang der Richtung [100]; c VSi entlang der [110]-Richtung; d VGe entlang der [110]-Richtung; e VSi entlang der [111]-Richtung; f VGe in Richtung [111]
Schlussfolgerungen
Zusammenfassend wurden niederenergetische Verschiebungsereignisse in Si-, Ge- und Si/Ge-Übergittern (SL) mit einer Ab-initio-Molekulardynamikmethode untersucht. In massivem Si und Ge zeigt sich, dass die Schwellenverschiebungsenergien von der kristallographischen Richtung abhängen, und die Atome sind schwieriger entlang der [110]-Richtung zu verschieben. Die beschädigten Zustände in Bulk-Zuständen sind hauptsächlich Leerstellen und Zwischengitterdefekte. In der Si/Ge-SL-Struktur sind die Si-Atome in [111]-Richtung widerstandsfähiger, während die Ge-Atome in [110]-Richtung schwieriger zu verschieben sind. Unsere Berechnungen zeigen, dass die Energien für die Ge-Rückstöße in der SL-Struktur im Allgemeinen mit denen in der massiven Ge-Struktur vergleichbar sind, während die Energien für die Si-Rückstöße in der SL-Struktur im Allgemeinen viel größer sind als die in der massiven Si-Struktur, was auf einen erhöhten Strahlungswiderstand hindeutet des Si/Ge-SL. Berechnungen der Defektbildungsenergie zeigen, dass die Punktdefekte in der Si/Ge-SL im Allgemeinen höhere Bildungsenergien aufweisen, was darauf hinweist, dass die Punktdefekte in der SL-Struktur im Allgemeinen schwieriger zu bilden sind. Es wurde auch festgestellt, dass die [111]-Richtung der günstigste Migrationspfad sowohl für Si- als auch für Ge-Leerstellen ist und beide Leerstellen in den Volumenzuständen beweglicher sind als in der SL-Struktur. Unsere Berechnungen legen nahe, dass die verbesserte Strahlungsbeständigkeit von Si/Ge SL für seine Anwendung als elektronische und optoelektronische Geräte unter extremen Arbeitsbedingungen wie Strahlung von Vorteil ist.
Abkürzungen
- AIMD:
-
Ab-initio-Moleküldynamik
- Ed :
-
Schwellenverschiebungsenergie
- FP:
-
Frenkel-Paar
- Ge:
-
Germanium
- Geint :
-
Germanium-Interstitial
- GeSi :
-
Germanium besetzt den Siliziumgitterplatz
- LDA:
-
Näherung der lokalen Dichte
- MD:
-
Molekulardynamik
- NVE:
-
Microcanonical ensemble
- PKA:
-
Primary knock-on atom
- PL:
-
Photolumineszenz
- QD:
-
Quantenpunkt
- QW:
-
Quantenbrunnen
- Si:
-
Silizium
- SIESTA:
-
Spanish Initiative for Electronic Simulations with Thousands of Atoms
- SiGe :
-
Silicon occupying the germanium lattice site
- Siint :
-
Silicon interstitial
- SL:
-
Superlattice
- SZP:
-
Single-ζ basis sets plus polarization orbital
- VGe :
-
Germanium vacancy
- VSi :
-
Silicon vacancy
Nanomaterialien
- Bewertung des IoT und der Auswirkungen von 5G
- Enthüllung der atomaren und elektronischen Struktur von gestapelten Kohlenstoff-Nanofasern
- Molekulardynamische Modellierung und Simulation des Diamantschneidens von Cer
- First-Principles-Studie zur Stabilität und dem STM-Image von Borophen
- Untersuchung der strukturellen, elektronischen und magnetischen Eigenschaften von Ag n V (n = 1–12)-Clustern
- Auswirkung des Glühens auf Mikrostrukturen und Härtung von Helium-Wasserstoff-implantierten sequentiell Vanadium-Legierungen
- Herstellung und Charakterisierung von ZnO-Nano-Clips durch das Polyol-vermittelte Verfahren
- Die sich schnell entwickelnde Welt der Simulation
- Der Unterschied zwischen Gleichstrom- und Wechselstrommotoren
- Die Leistungsfähigkeit der 3D-Modellierung und -Simulation fördert Innovationen im Fertigungsprozess



