Eine bequeme und effektive Methode zum Abscheiden von nc-Si:H-Dünnfilmen mit geringer Defektdichte durch PECVD
Zusammenfassung
Hydrierter nanokristalliner Silizium (nc-Si:H)-Dünnfilm hat viel Aufmerksamkeit als vielversprechendes Material für Flachbildschirmtransistoren, Solarzellen usw. erhalten. Die Mehrphasenstruktur von nc-Si:H führt jedoch zu vielen Defekten. Eine der großen Herausforderungen besteht darin, die Defekte bequem zu reduzieren. In dieser Arbeit haben wir eine einfache und effektive Methode entwickelt, um nc-Si:H-Dünnfilme mit geringer Defektdichte abzuscheiden. Dieses Verfahren besteht einfach darin, den Abscheidungsdruck in einem Hochdruckbereich in einem plasmaunterstützten chemischen Gasphasenabscheidungsverfahren (PECVD) abzustimmen. Mikrostrukturen des nc-Si:H wurden durch Raman, AFM und SEM charakterisiert. Darüber hinaus haben wir uns auf die Defektdichte konzentriert, die das Schlüsselmerkmal für photovoltaische Materialien ist und eine Defektdichte von 3,766 × 10 16 . erreicht cm −3 . Diese Defektdichte ist geringer als in früheren Studien zur Herstellung von nc-Si:H mit niedriger Defektdichte durch andere komplexe Verfahren im PECVD-Prozess. Die Lebensdauer der Minoritätsträger von nc-Si:H wird somit stark verbessert. Darüber hinaus haben wir den Mechanismus der Wirkung des Abscheidungsdrucks auf den Ionenbeschuss demonstriert und bewiesen, dass die Defektdichte das Schlüsselmerkmal für nc-Si:H-Photovoltaikmaterial ist.
Hintergrund
Ein wichtiger Meilenstein im Fortschritt der Dünnschicht-Silizium-Technologie ist die Entwicklung von hochwertigem hydriertem nanokristallinem Silizium (nc-Si:H). Im Vergleich zu hydriertem amorphem Silizium (a-Si:H) hat nc-Si:H eine viel höhere Mobilität, ein viel besseres Ansprechverhalten bei Wellenlängen über 800 nm und ist viel weniger anfällig für die Staebler-Wronski-Degradation [1, 2]. nc-Si:H-Dünnfilme können mittels plasmaunterstützter chemischer Gasphasenabscheidung (PECVD) abgeschieden werden, wodurch sie mit der gut entwickelten integrierten Schaltungsindustrie kompatibel sind. Daher findet die nc-Si:H-Dünnschicht eine breite Anwendung in verschiedenen Bauelementen, wie z. B. Dünnschichttransistoren [3], Fotodetektoren [4] und Solarzellen [5].
Als mehrphasiges Material weist der nc-Si:H-Dünnfilm jedoch seine eigenen Defekte wie Hohlräume und baumelnde Bindungen an den Grenzflächen von Kristallen/amorpher Phase und zwischen Kristallen auf. Es ist bekannt, dass der atomare Wasserstoff der Schlüssel zur Abscheidung von qualitativ hochwertigem nc-Si:H ist, das weniger Defekte aufweist [6]. Der atomare Wasserstoff kann baumelnde Bindungen sättigen, und es wurde darauf hingewiesen [7], dass der atomare Wasserstoff auf der wachsenden Oberfläche das Kristallwachstum bei einer viel niedrigeren Temperatur als der Schmelztemperatur bewirkt. Somit ist mehr atomarer Wasserstoff für die Abscheidung von hochwertigem nc-Si:H von Vorteil. Um den atomaren Wasserstofffluss auf der Wachstumsoberfläche zu erhöhen, wäre eine hohe Wasserstoffverdünnung oder Silanverarmung für das nc-Si:H-Wachstum unerlässlich.
Die Erzielung einer Silanverarmung bei PECVD soll die Hochfrequenzleistung (RF) erhöhen [7]. Aber eine einfache Erhöhung der Leistung wird den Ionenbeschuss auf der wachsenden Oberfläche dramatisch erhöhen, was wahrscheinlich zu mehr Defekten führt. Daher sollte eine Gleichstromvorspannung (DC) verwendet werden, um den Ionenbeschuss zu unterdrücken. Wenn jedoch die HF-Leistung erhöht wird, um mehr atomaren Wasserstoff zu erhalten, sollte auch die DC-Vorspannung geändert werden. Andernfalls kann die DC-Vorspannung den Ionenbeschuss nicht wirksam lindern. Und die geeignete DC-Vorspannung bei einer bestimmten HF-Leistung kann ohne die umfangreichen Experimente nicht gefunden werden. Ein weiteres Verfahren zum Erhöhen des atomaren Wasserstoffgehalts besteht darin, den Abscheidungsdruck zu erhöhen. Die Elektronen-Molekül-Kollisionsfrequenz steigt mit dem Abscheidungsdruck. Es macht die Dissoziationsrate von SiH4 und H2 steigend. Eine Dissoziation von SiH4 und H2 erzeugt den atomaren Wasserstoff [8]. Infolgedessen könnte ein erhöhter Abscheidungsdruck den atomaren Wasserstoffgehalt erhöhen.
In dieser Arbeit schlagen wir daher vor, den Abscheidungsdruck in einem Hochdruckbereich abzustimmen, um mehr atomaren Wasserstoff zu erhalten (der herkömmliche Abscheidungsdruck beträgt 50–100 Pa). Es ist eine bequeme und effektive Methode im PECVD-Prozess. Durch dieses Verfahren weist der unter einem bestimmten Druck abgeschiedene Film eine geringere Defektdichte im Vergleich zu früheren Studien zur Herstellung von nc-Si:H mit niedriger Defektdichte auf [5, 9, 10]. Und es wurde eine hohe Lebensdauer der Minoritätsträger erreicht. Darüber hinaus haben wir im Vergleich zu den vorherigen Berichten über den Einfluss unterschiedlicher Abscheidungsdrücke auf die makroskopischen oder allgemeinen Eigenschaften der Proben [11, 12] den Bereich des Abscheidungsdrucks deutlich erweitert und uns nicht nur auf die allgemeinen Eigenschaften konzentriert (zB Kristallinität), aber auch auf die Defektdichte und die Lebensdauer der Minoritätsträger, die Schlüsselmerkmale für hochwertiges photovoltaisches Material sind. Darüber hinaus haben wir den Mechanismus der Wirkung des Ablagerungsdrucks auf den Ionenbeschuss demonstriert, während frühere Berichte nur allgemeine Diskussionen lieferten. Und wir haben weiter bewiesen, dass der Ionenbeschuss nicht umso schwächer ist, desto besser für das Filmwachstum (der Grad des Ionenbeschusses sollte angemessen sein). Am Ende haben wir bewiesen, dass die Defektdichte das Schlüsselmerkmal für nc-Si:H-Photovoltaikmaterial ist.
Methoden/Experimental
Die nc-Si:H-Dünnschichten wurden auf Corning-Glas durch ein kapazitiv gekoppeltes PECVD-System (das schematische Diagramm des Reaktors ist in Fig. 1a gezeigt) bei unterschiedlichem Abscheidungsdruck aufgewachsen. Der Abscheidungsdruck wurde von 150 auf 1050 Pa erhöht, mit einer Stufe von 150 Pa. Alle Proben wurden unter Verwendung von HF von 13,56 MHz und einer Leistungsdichte von 0,32 W/cm² abgeschieden , mit einem Gesamtgas (SiH4 und H2 ) Flussrate von 110 sccm (der SiH4 Konzentration betrug 0,727%). Die Substrattemperatur wurde bei 250 °C gehalten und die Abscheidungszeit betrug 2 h.
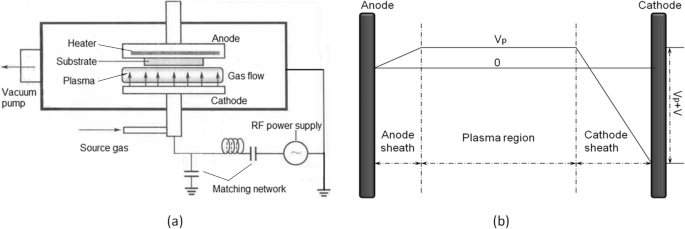
Das schematische Diagramm von a der PECVD-Reaktor und b die Potentialverteilung zwischen den Elektroden (V p , das Plasmapotential; V , der quadratische Mittelwert des HF-Potentials)
Die Kristallinität X c wurde aus Raman-Spektren berechnet, die mit einem UV-Mikro-Raman-Spektrometer (Jobin Yvon LabRam, HR800) im Rückstreumodus unter Verwendung eines Ar-Ionen-Lasers bei 514,5 nm gemessen wurden. Die Laserleistungsdichte wurde bei 1 mW/mm 2 . gehalten um eine strahlinduzierte Kristallisation zu vermeiden. Die Defektdichte der Proben wurde durch die Spindichte Ns charakterisiert, die aus den mit einem Elektronenspinresonanz (ESR)-Spektrometer (Bruker, EMX-8X-Band) bei 9,8 GHz und 5 mW gemessenen Ergebnissen berechnet wurde. Die effektive Lebensdauer der Minoritätsträger τ wurde mit einem Semilab WT-1200A gemessen. Die Oberflächenmorphologie dieser Filme wurde mit einem Rasterkraftmikroskop (AFM, SII Nanonavi E-Sweep) beobachtet und die Mikromorphologie wurde mit einem Rasterelektronenmikroskop (SEM, Sirion 200) beobachtet.
Ergebnisse und Diskussion
Strukturuntersuchung durch Raman-Analyse
Zur strukturellen Untersuchung des unter verschiedenen Drücken abgeschiedenen nc-Si:H-Dünnfilms wurden Mikro-Raman-Messungen durchgeführt. In Abb. 2 wurden vier repräsentative Proben ausgewählt, um die Raman-Spektren zu zeigen. Sie werden unter 300 Pa, 450 Pa, 750 Pa bzw. 1050 Pa abgeschieden. Jedes Spektrum (offene Kreise) unter einem bestimmten Druck kann in drei Gaußsche Spitzen entfaltet werden:(1) eine breite Gaußsche Verteilung um 480 cm −1 , die der transversalen Optik zugeschrieben wird (TO1 ) Modus von amorphem Silizium; (2) ein Peak in der Nähe von 520 cm −1 , das zum asymmetrischen TO2 . gehört Schwingungsmode von kristallinem Silizium [13, 14]; und (3) der Peak um 506 cm −1 die der Zwischenbereichsordnung zugeschrieben wird [1, 15]. Die Kristallinität (X c ) in nc-Si:H kann berechnet werden nach [16, 17]:
$$ {X}_c=\left({I}_{520}+{I}_{506}\right)/\left({I}_{520}+{I}_{506}+\gamma {I}_{480}\right) $$ (1)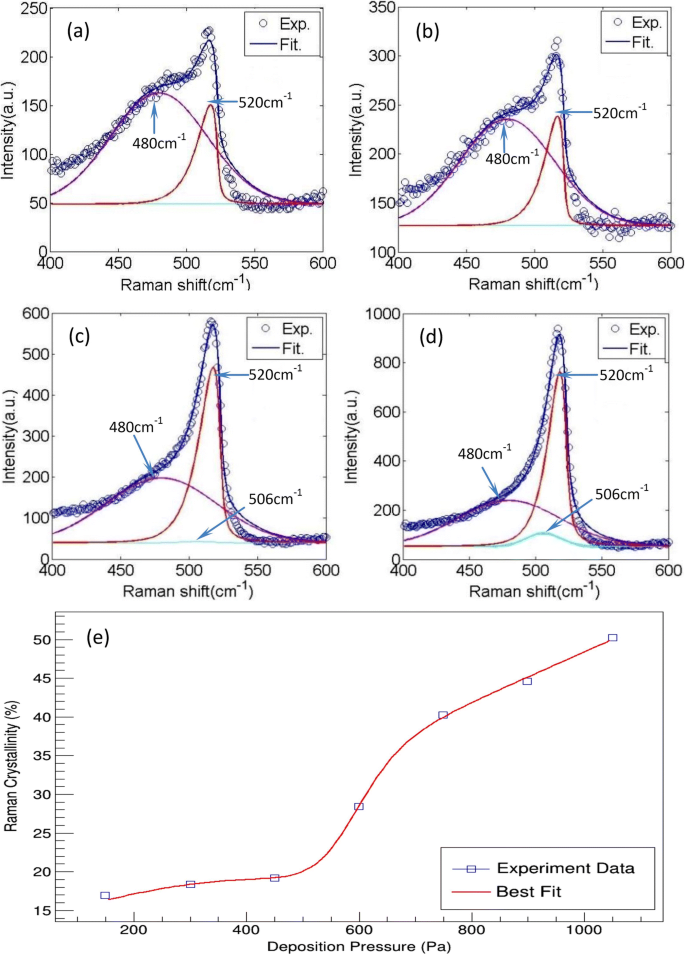
Raman-Spektren und ihre Entfaltung typischer Proben, die unter 300 Pa (a ), 450 Pa (b ), 750 Pa (c ) und 1050 Pa (d ) und die berechnete Kristallinität von nc-Si:H-Dünnschichten, die unter verschiedenen Drücken abgeschieden wurden (e )
wo γ ist das Verhältnis des integrierten Raman-Querschnitts für c-Si zu a-Si (γ = 1 [17, 18]) und I 520 , ich 506 , ich 480 sind die integrierten Intensitäten der beobachteten Peaks bei 520, 506, 480 cm −1 , bzw. Die Kristallinität als Funktion verschiedener Abscheidungsdrücke ist in Abb. 2e aufgetragen.
Es ist bekannt, dass der atomare Wasserstoff (H) hauptsächlich aus den folgenden zwei Kollisionen im wasserstoffverdünnten Silanplasma erzeugt wird [8]:
- a.
Die primäre Elektron-Silan-Reaktion
- b.
Die Elektron-Wasserstoff-Reaktion
Nach den Formeln S(1) und S(2) in der Additional-Datei 1 erhalten wir \({n}_e=\frac{P}{RT}\bullet \mu\) (P , Abscheidungsdruck; R , ideale Gaskonstante; T , absolute Temperatur des Gases vor der Entladung; μ , Ionisationsrate; und n e , Elektronendichte). μ wegen der unveränderten HF-Leistung konstant ist und T ist auch konstant. Die Elektronendichte n e steigt somit mit dem Abscheidungsdruck P . Nach chemischen Gl. (2) und (3) steigt die Dichte von H, die im Plasma erzeugt wird, mit n e . Dies ist die theoretische Analyse im Idealzustand. Der Entladungsprozess ist so komplex, dass die Analyse des Entladungsprozesses (d. h. Plasmadiagnosen) zu einer eigenständigen Disziplin wird. Die Änderung von H mit dem Abscheidungsdruck im realen Zustand sollte durch Plasmadiagnosen gemessen werden. Yanget al. gemessen die Intensität von \( {H}_{\alpha}^{\ast } \) (\( {I}_{H_{\alpha}^{\ast }} \)) durch optische Emissionsspektren (OES) und zeigen Sie, dass \( {I}_{H_{\alpha}^{\ast }} \) zuerst zunimmt, dann abnimmt [19]. Nach früheren Plasmadiagnoseberichten gibt die Intensität von \({H}_{\alpha}^{\ast}\) die Menge an atomarem Wasserstoff an [20, 21]. Somit nimmt die Dichte von H im Plasma zuerst zu und nimmt dann ab, wenn der Abscheidungsdruck weiter ansteigt. Dieser Trend unterscheidet sich ein wenig von unserer theoretischen Analyse. Der Unterschied hängt mit der Nebenreaktion von H zusammen:
$$ \mathrm{H}+{\mathrm{SiH}}_4\to {\mathrm{H}}_2+{\mathrm{SiH}}_3 $$ (4)wobei SiH4 ist diejenige, die nicht zersetzt wird, d. h. das verbleibende SiH4 . In unserem Experiment wird der Abscheidungsdruck erhöht, indem der Abfluss von Gasen einschließlich SiH4 . verringert wird . Mit anderen Worten, es ist gleichwertig, den Zuschlag von SiH4 . zu erhöhen .Wenn der Abscheidungsdruck auf ein bestimmtes Niveau ansteigt, wird die Geschwindigkeit von SiH4 Nahrungsergänzung überschreitet seine Zersetzungsgeschwindigkeit. Somit gibt es mehr Mengen an SiH4 links. Es gibt eine Distanz für H von seinem Austritt aus dem Plasma bis zu seiner Ankunft auf der Filmwachstumsoberfläche. H reagiert mit dem restlichen SiH4 in diesem Abstand, wie in der sekundären chemischen Gl. (4). Die Dichte von H nimmt somit ab. Als Ergebnis nimmt die atomare Wasserstoffdichte zuerst zu und nimmt dann ab, wenn der Abscheidungsdruck weiter ansteigt. Es ist bekannt, dass eine größere Menge an H für die Abscheidung von nc-Si:H mit niedriger Defektdichte vorteilhaft ist. Daher zeigt die Defektdichte von nc-Si:H, die in unserem Experiment abgeschieden wurde, die gleiche Tendenz der atomaren Wasserstoffdichte, d. h. die Defektdichte nimmt zuerst ab und steigt dann an. Die Diskussionen über den Trend der Defektdichte im Detail werden im letzten Abschnitt gezeigt.
In Abb. 2e ist deutlich zu erkennen, dass die Kristallinität von nc-Si:H, X c , nimmt mit dem Abscheidungsdruck zu. Dies weist darauf hin, dass ein zunehmender Druck X . erhöhen kann c . Die Kristallinität wird nicht nur durch den atomaren Wasserstoff beeinflusst, sondern auch durch den Gehalt an Wachstumsvorläufer SiHn (n = 1,2,3, hauptsächlich n = 3) was durch SiH * . angegeben werden kann bei der OES-Messung [21, 22]. Hsieh et al. haben gezeigt, dass \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ (das Intensitätsverhältnis \( {H}_{\alpha}^{\ast } \)/SiH * ) nimmt mit dem Abscheidungsdruck zu [20]. Es wird allgemein akzeptiert, dass \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ ist der Index für X c , d. h. X c steigt mit der Zunahme von \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ [21, 23]. Daher ist das \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ trend unterstützt stark unser Ergebnis über die Tendenz von X c .
Die mittlere Korngröße d kann auch aus dem Raman-Spektrum abgeleitet werden, gemäß der Formel [24, 25]:
$$ d=2\pi \sqrt{B/\Delta \upnu} $$ (5)wo ∆ν ist die Frequenz in der Einheit cm −1 Verschiebung, die als Differenz zwischen dem beobachteten Spitzenfrequenzwert und dem des Si-Volumens definiert wurde. Mit dem üblichen Wert von B von 2,0 cm −1 nm 2 [25], d = 4,07~4,50 nm.
Oberflächenmorphologie und der Mechanismus über den Einfluss des Ablagerungsdrucks auf den Ionenbeschuss
Neben der Strukturanalyse durch Raman-Spektroskopie wurde die Morphologie der Proben auch durch AFM charakterisiert, wie in Abb. 3 gezeigt dargestellt in Fig. 3h (RMS-Wert wurde über mehrere verschiedene Stellen in jedem Film gemittelt). In Fig. 3h nimmt RMS ab, wenn der Abscheidungsdruck ansteigt. Der zunehmende Druck verursacht eine erschwerte Kollision zwischen Partikeln und einen anschließenden Verlust an kinetischer Energie, wenn diese Partikel die Filmwachstumsoberfläche erreichen. Ionen mit niedrigerer Energie, die an der Filmwachstumsoberfläche ankommen, führen zu einem schwächeren Ionenbeschuss. Es deutet darauf hin, dass der zunehmende Druck der Unterdrückung des Ionenbeschusses zuträglich ist, was auch im vorherigen Bericht erwähnt wurde [7]. Der Mechanismus über den Einfluss des Abscheidungsdrucks auf den Ionenbeschuss wurde jedoch nicht nachgewiesen. Es wird wie folgt untersucht.

AFM-Bilder von nc-Si:H-Dünnschichten, die eine Änderung der Oberflächenmorphologie durch verschiedene Abscheidungsdrücke zeigen. a 150 Pa, b 300 Pa, c 450 Pa, d 600 Pa, e 750 Pa, f 900 Pa und g 1050 Pa. Die Krater in a und b sind durch gestrichelte Kreise markiert, und der quadratische Mittelwert (RMS) der Rauheit der Filmoberflächen unter verschiedenen Abscheidungsdrücken ist mit h . markiert
Die Potentialverteilung zwischen den beiden Elektroden lässt sich in drei Bereiche unterteilen:Plasmabereich im Zentrum, Anodenmantel und Kathodenmantel (siehe Abb. 1b). Die Ionen, die zum Ionenbeschuss führen, müssen aus dem Plasmabereich diffundieren und die Anodenhülle passieren. Das Plasmapotential ist höher als das aller anderen Abschnitte des Reaktors, weil Elektronen schneller diffundieren als Ionen. Da unsere Reaktorwand geerdet ist, ist das Plasmapotential positiv (siehe Abb. 1). Anionen werden somit im Plasmabereich eingefangen; nur die neutralen Partikel und Kationen können zur Anodenhülle diffundieren und schließlich die Filmwachstumsoberfläche erreichen. Mit anderen Worten, der Ionenbombardement in unserem Experiment wird nur durch Kationen verursacht. Kationen passieren die Anodenhülle kollisionsfrei, da die Hüllenbreite sehr gering ist (der Nachweis im Detail ist in Zusatzdatei 1 gezeigt). Dadurch werden Kationen beim Eintritt in die Hülle nur durch das elektrische Feld der Anodenhülle beschleunigt. Daher hängt die Stärke des Ionenbeschusses nur von der Anfangsgeschwindigkeit des Kations ab, wenn es gerade in die Anodenhülle eindringt (v 0 ) und den Grad der Beschleunigung durch das elektrische Feld der Anodenhülle danach.
Erstens die Korrelation von v 0 mit dem Abscheidungsdruck analysiert werden. Partikel, die Kationen enthalten, verlieren ihre kinetische Energie im Plasmabereich aufgrund der erschwerenden Kollision, wenn der Abscheidungsdruck ansteigt. Also, v 0 sinkt mit steigendem Druck. Dann wird die Variation des Beschleunigungsgrades durch das elektrische Feld der Hülle mit dem Abscheidungsdruck demonstriert. Es ist bekannt, dass [22]:
$$ {V}_p-{V}_f=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$wo m e ist die Masse des Elektrons; m ich ist die Masse des Ions; T e und T ich sind die Temperatur des Elektrons bzw. des Ions; V p ist das Plasmapotential; und V f ist das schwebende Potential. Da das Substrat in unserem Reaktor aufgehängt ist, beträgt die Spannung der Anodenhülle V Scheide ist gleich V p − V f , dann haben wir:
$$ {V}_{\mathrm{Hülle}}=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$ (6)In der Plasmaregion T e nimmt ab, da ein zunehmender Abscheidungsdruck die Kollision zwischen den Partikeln (einschließlich Elektronen und Ionen) verstärkt. Hsieh et al. haben gezeigt, dass T e sinkt mit steigendem Abscheidungsdruck durch die OES-Messung [20]. Dies deutet darauf hin, dass der Trend von T e nach unserer theoretischen Analyse ist absolut richtig. Verglichen mit T e , T ich nimmt so wenig ab, dass es als unverändert angesehen werden kann. Als Ergebnis V Scheide sinkt bei Druckerhöhung gemäß Formel (6). Es schwächt den Grad der Beschleunigung durch die Anodenhülle. Gepaart mit fallendem v 0 , können wir den Schluss ziehen, dass die kinetische Energie von Kationen, die die Filmwachstumsoberfläche erreicht, mit zunehmendem Druck viel kleiner wird. Mit anderen Worten, ein zunehmender Abscheidungsdruck macht den Ionenbeschusseffekt schwächer. Daher sinkt der RMS der Filmoberfläche von 150 auf 1050 Pa. Laut dem vorherigen Bericht ist die Kristallinität umso besser, je niedriger die Ionenenergie ist [7]. Es unterstützt auch die Schlussfolgerung über die Korrelation zwischen Kristallinität und Abscheidungsdruck, die wir bereits gezogen haben. Darüber hinaus sind die Filmoberflächen, die unter viel niedrigeren Drücken (150 Pa und 300 Pa) abgeschieden werden, rauer, und wir können auch sehen, dass diese Oberflächen viele Krater enthalten, wie in Abb. 4a, b gezeigt. Das ist die Folge eines starken Ionenbeschusses. Aus Fig. 3 können wir offensichtlich schließen, dass der unter 450 Pa abgeschiedene Film am kompaktesten (insbesondere in den Fig. 5c und 6d gezeigt) und gleichförmig ist.
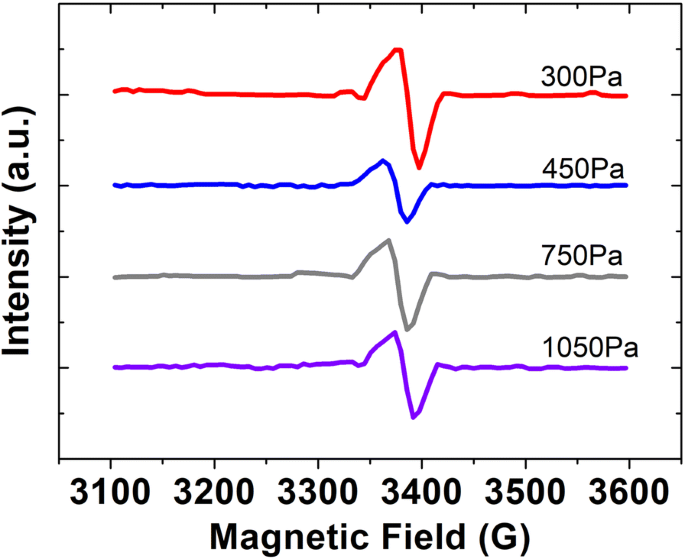
Die ESR-Spektren typischer Proben, die unter 300 Pa, 450 Pa, 750 Pa, 1050 Pa abgeschieden wurden
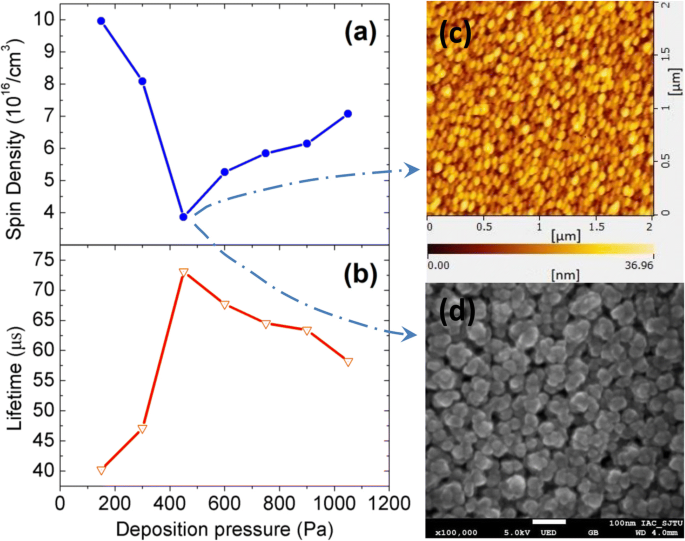
Abhängigkeit der Spindichte (a ) und effektive Minoritätsträgerlebensdauer (b ) bei unterschiedlichen Abscheidungsdrücken. Das hochauflösende AFM-Bild (c ) und SEM-Bild (d ) aus nc-Si:H-Dünnfilm, abgeschieden unter 450 Pa

Schematische Darstellung der Partikeldiffusion auf der wachsenden Oberfläche
Fehlerdichte und elektrische Eigenschaften
Die Wirkung des Abscheidungsdrucks auf die Defektdichte des nc-Si:H-Dünnfilms wurde durch die ESR-Technik untersucht. Abbildung 4 zeigt die vier ESR-Spektren typischer Proben, die jeweils unter 300 Pa, 450 Pa, 750 Pa bzw. 1050 Pa abgeschieden wurden. Die Daten von Fig. 5a werden aus dem ESR-Spektrum jeder Probe berechnet. Wie in Fig. 5a gezeigt, nimmt die Spindichte bei steigendem Druck zuerst ab und steigt dann an. Bei 450 Pa gibt es ein Minimum. Nach dem ESR-Prinzip ist die Anzahl der ungepaarten Spins direkt proportional zur Dichte der neutralen Dangling Bonds. Diese Bindungen befinden sich hauptsächlich in der Filmwachstumsoberfläche und bilden den stationären Defekt der Filmwachstumsoberfläche, während die Defektdichte im resultierenden Film im Wesentlichen durch diese stationäre Defektdichte bestimmt wird [26]. Daher sind die aus den ESR-Spektren berechneten Ergebnisse tatsächlich die Defektdichte des resultierenden Films. Diese Ergebnisse in Fig. 5a zeigen, dass die Defektdichte in nc-Si:H bei 450 Pa ein Minimum erreicht, das 3,766 × 10 16 . beträgt cm −3 . Chowdhuryet al. untersuchten die Herstellung von nc-Si:H mit geringer Defektdichte. Als sie eine 13,56-MHz-HF-Quelle verwendeten, taten sie ihr Bestes, um eine geringe Fehlerdichte zu erreichen. Die Werte waren 1,1 × 10 17 . und 7,0 × 10 16 cm −3 . Bei Verwendung einer sehr hochfrequenten (VHF) Anregungsquelle (54,24 MHz) erreichten sie die niedrigste Defektdichte von 4,3 × 10 16 cm −3 [10]. Es ist bekannt, dass die Ionenenergie im VHF-Plasma gering ist und die Dichte des Ionenflusses hoch ist. Aufgrund dieser beiden Faktoren weist der durch VHF-PECVD abgeschiedene Dünnfilm eine geringe Defektdichte und damit eine hohe Qualität auf [27]. Allerdings ist die Defektdichte höher als bei uns, und die 54,24-MHz-Anregungsquelle ist viel teurer als ihr 13,56-MHz-Pendant. Um eine geringe Defektdichte zu erreichen, haben Wen et al. zusätzlich angelegter DC-Bias. Das Minimum beträgt jedoch 4.0 × 10 16 . cm −3 [9]. Eine geeignete HF-Leistung zu finden ist nicht einfach, geschweige denn eine geeignete DC-Vorspannung. Der Grund dafür ist, dass die DC-Vorspannung abgestimmt werden sollte, sobald die HF-Leistung geändert wird. Andernfalls kann die DC-Vorspannung den Ionenbeschuss nicht wirksam lindern. Im Gegensatz dazu ist unsere Methode einfach. Kürzlich haben Jadhavar et al. haben durch PECVD ein hochwertiges nc-Si:H abgeschieden, das eine geringe Defektdichte aufweist. Die Defektdichte beträgt etwa 8,75 × 10 16 cm −3 [5]. Daher ist unser Verfahren zum Erzielen eines Dünnfilms mit geringer Defektdichte bequem und effektiv. Unter Berücksichtigung der Tatsache, dass die Minoritätsträgerlebensdauer umso höher sein sollte, je geringer die Defektdichte ist, haben wir die Messung der Minoritätsträgerlebensdauer direkt durchgeführt. Wie in Fig. 5b gezeigt, erreicht die effektive Minoritätsträgerlebensdauer ihr Maximum bei 450 Pa. Der Trend der Minoritätsträgerlebensdauer synchronisiert sich mit dem der Defektdichte, die aus den ESR-Spektren berechnet wird. Dies zeigt, dass die Defektdichte der Filme absolut durch ESR gemessen werden kann.
Beziehung zwischen Ionenbeschuss und Defektdichte
Erhöhen des Drucks kann den Ionenbeschuss unterdrücken. Die Defektdichte sollte gewissermaßen kontinuierlich von 150 auf 1050 Pa abdriften. Tatsächlich nimmt sie ab und steigt dann an. Es gibt noch einen weiteren Faktor, der nicht außer Acht gelassen werden sollte – die Diffusion von H und SiH3 (im Plasma ist der Hauptfilmvorläufer SiH3 [26]). Das schematische Diagramm der Partikeldiffusion auf der wachsenden Oberfläche ist in Abb. 6 dargestellt. Von 150 bis 1050 Pa nimmt die kinetische Energie der Partikel ab. Der Ionenbombardementeffekt ist sicherlich immer geringer. Allerdings reduziert sich die kinetische Energie von Partikeln aufgrund der zunehmenden Partikelkollisionshäufigkeit deutlich von 450 auf 1050 Pa. Der atomare Wasserstoff, der der Schlüssel zur Abscheidung von hochwertigem nc-Si:H ist, verliert seine kinetische Energie so stark, dass er nicht weiter diffundieren kann, um weitere baumelnde Bindungen zu sättigen, geschweige denn seine Dichte beginnt abzunehmen, was in der „Strukturuntersuchung durch Raman-Analyse.“ Andererseits verlieren Teilchen, einschließlich atomarer Wasserstoff, ihre kinetische Energie dramatisch, sodass sie nicht mehr Energie auf die wachsende Oberfläche übertragen können. Somit ist die Diffusionslänge von SiH3 Vorläufer kann nicht verbessert werden. Es ist bekannt, dass wenn SiH3 absorbiert an der Oberfläche die energetisch günstigen Wachstumsstellen finden könnte, bildet sich eine atomar geordnetere Struktur. Aber jetzt, SiH3 hat nicht genug Diffusionslänge, um ihre energetisch günstigen Wachstumsstandorte zu finden. Daher kann die geordnete Struktur nicht gebildet werden. Mit anderen Worten, der abgeschiedene Film weist mehr Defekte auf. Als Ergebnis beginnt die Spindichte in Fig. 5a im Gegenteil ab 450 Pa anzusteigen. Bemerkenswert ist jedoch, dass die Spindichten von 600 bis 1050 Pa immer noch niedriger sind als die von 150 bis 300 Pa. Dies ist das Ergebnis des schwächeren Ionenbeschusses. Darüber hinaus ist SiH3 . aufgrund seiner reduzierten Diffusionslänge Vorläufer neigen dazu, sich zu Aggregaten anzuhäufen. Wie in Fig. 3 gezeigt, begannen Aggregate bei 750 Pa zu erscheinen, und sie agglomerierten allmählich intensiver, wenn der Abscheidungsdruck weiter anstieg. Gemäß den obigen Punkten ist der Ionenbeschuss nicht umso schwächer, desto besser für das Filmwachstum. Der Grad des Ionenbeschusses sollte angemessen sein.
Defektdichte:das Hauptmerkmal von nc-Si:H-Photovoltaikmaterial
Kristallinität und Defektdichte sind beides Eigenschaften von nc-Si:H-Solarzellenmaterialien. Ersteres steigt mit dem Abscheidungsdruck. Letzteres sollte gewissermaßen weiter zurückgehen. Dies ist jedoch nicht der Fall. Gemäß der Raman-Charakterisierung ist, obwohl die Kristallinität zunimmt, die Variation der Korngröße sehr gering (4,07 bis 4,50 nm). Es zeigt an, dass nur die Anzahl der Körner zunimmt, nicht die Größe der Körner. Unter diesen Bedingungen steigt das Volumen der Korngrenzen. Es ist bekannt, dass Korngrenzen Bulk-Defekte und Rekombinationszentren sind. Mehr Korngrenzen erhöhen die Defektdichte. Steigt die Kristallinität auf ein bestimmtes Niveau, überwiegt der negative Effekt einer Zunahme des Korngrenzenvolumens auf die Defektdichte den positiven Effekt der steigenden Körnerzahl. Daher nimmt die Defektdichte mit wachsender Kristallinität nicht weiter ab; im Gegenteil, sie steigt an, nachdem die Kristallinität ein bestimmtes Niveau erreicht hat. Dieses Ergebnis legt nahe, dass nc-Si:H-Dünnfilme mit höherer Kristallinität nicht unbedingt eine bessere Qualität aufweisen, was von einer anderen Forschungsgruppe bestätigt wird. In den letzten Jahren wurde berichtet, dass die optimale nc-Si:H-Schicht für Solarzellen nahe der Phasenübergangsgrenze erhalten wird, dh das Optimum wird unmittelbar nach der a-Si:H-zu-nc-Si:H&sub2; Überleitung. Die Kristallinität optimaler nc-Si:H-Schichten ist nicht hoch [28,29,30]. Mukhopadhyayet al. haben weiterhin gezeigt, dass nc-Si:H-Schichten mit hoher Kristallinität und damit geringer lichtinduzierter Degradation keine hochwertigen Solarzellen ergeben. Die stabilisierte Effizienz von Zellen, die direkt nach dem a-Si:H-zu-nc-Si:H-Übergang abgeschieden werden, ist höher als die von Zellen, bei denen die i-Schicht eine hohe Kristallinität aufweist, obwohl erstere vor der Stabilisierung stärker abgebaut werden als letztere [31]. Hanet al. haben weiter bewiesen, dass die lichtinduzierte Degradation der nc-Si:H-Schicht durch die Bildung metastabiler Dangling Bonds eingeführt wird. Während die lichtinduzierte Strukturänderung ein Vorläuferprozess der metastabilen Dangling-Bond-Bildung ist [30]. Der metastabile Dangling Bond ist einer der Defekte [32]. Daher ist die Haupteigenschaft für hochwertige nc-Si:H-Photovoltaikmaterialien eher die Defektdichte als die Kristallinität, Lichtstabilität oder andere Eigenschaften.
Schlussfolgerungen
nc-Si:H-Dünnfilme wurden durch Variation des Drucks zwischen 150 und 1050 Pa abgeschieden. Der Abscheidungsdruckbereich ist höher als bei der herkömmlichen Abscheidung im PECVD-Prozess. Es wurde festgestellt, dass die Kristallinität mit steigendem Abscheidungsdruck zunimmt und die Rauheit der Filmoberflächen abnimmt. Die mittlere Korngröße d = 4,07~4,50 nm. Darüber hinaus haben wir uns auf den Einfluss des Abscheidungsdrucks nicht nur auf die makroskopischen oder üblichen Eigenschaften von Proben konzentriert, sondern auch auf die Defektdichte und die Lebensdauer der Minoritätsträger, die wichtigere Eigenschaften sind. Es zeigt sich, dass die Defektdichte der Proben zunächst abnimmt und dann zunimmt, wenn der Abscheidungsdruck ansteigt. Die Defektdichte erreicht ihr Minimum (3,766 × 10 16 cm −3 ) bei 450 Pa. Sie ist niedriger als die der vorherigen Studien zur Herstellung von nc-Si:H-Dünnschichten mit niedriger Defektdichte. Diese Arbeit bietet einen bequemen und effektiven Weg zum Abscheiden von nc-Si:H mit niedriger Defektdichte durch PECVD. Und wir haben den Mechanismus der Wirkung des Ablagerungsdrucks auf den Ionenbeschuss demonstriert. Darüber hinaus ist nachgewiesen, dass der Ionenbeschuss nicht umso schwächer ist, desto besser für das Filmwachstum. Der Grad des Ionenbeschusses sollte angemessen sein.
Abkürzungen
- AFM:
-
Rasterkraftmikroskop
- DC:
-
Gleichstrom
- H:
-
Atomarer Wasserstoff
- nc-Si:H:
-
Hydriertes nanokristallines Silizium
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- SEM:
-
Rasterelektronenmikroskopie
- UKW:
-
Sehr hohe Frequenz
Nanomaterialien
- Mesh aktuelle Methode und Analyse
- Abstrakte C#-Klasse und -Methode
- C# Teilklasse und Teilmethode
- Versiegelte C#-Klasse und -Methode
- Antifog-PC-Folie für Visiere, Linsen und Brillen
- Java String replace(), replaceAll() und replaceFirst() Methode
- Amorphe Silizium-Nanodrähte, die durch Glühen auf Siliziumoxid-Film gewachsen sind
- Effizientes und effektives Design von InP-Nanodrähten für maximale Sonnenenergiegewinnung
- Herstellung von SrGe2-Dünnschichten auf Ge (100), (110) und (111) Substraten
- Rapid Tooling Service und seine effektiven Anwendungen



