Gemeinsame Dosierung von Ozon und entionisiertem Wasser als oxidierende Vorläufer des ZnO-Dünnschichtwachstums durch Atomlagenabscheidung
Zusammenfassung
Eigenschaften von durch Atomlagenabscheidung (ALD) gezüchteten ZnO-Dünnschichten auf Saphirsubstraten mit und ohne drei gepulstem Ozon (O3 ) als Oxidationsmittelvorläufer und das thermische Glühen (TA) nach der Abscheidung werden untersucht. Die Abscheidungstemperatur und die Dicke der ZnO-Epischichten betragen 180 °C bzw. 85 nm. Das thermische Glühen nach der Abscheidung wird bei 300 °C in einer Umgebung von Sauerstoff (O2 ) für 1 Std. Mit starkem Oxidationsmittel O3 und TA nach der Abscheidung in wachsendem ZnO werden intrinsische Spannung und Spannung auf 0,49% bzw. 2,22 GPa reduziert, bei extrem niedriger Hintergrundelektronenkonzentration (9,4 × 10 15 cm −3 ). Dies ist auf eine geringere Dichte thermisch aktivierter Defekte bei den Analysen des thermischen Quenchens der integrierten Intensität von Photolumineszenz-(PL)-Spektren zurückzuführen. TA erleichtert außerdem die Rekristallisation, wodurch mehr defektfreie Körner gebildet werden, und reduziert dann den Spannungs- und Spannungszustand, was zu einer bemerkenswerten Abnahme der Elektronenkonzentration und einer Verbesserung der Oberflächenrauheit führt.
Einführung
Beim ZnO-Wachstum werden mehrere Oxidationsmittel verwendet. Dazu gehören Wasser (H2 O), Wasserstoffperoxid (H2 .) O2 ), Sauerstoff (O2 ) und Ozon (O3 ) [1,2,3,4,5,6]. H2 O ist ein häufig verwendetes Oxidationsmittel beim ZnO-Wachstum mit Atomlagenabscheidung (ALD). ALD ist ein schichtweise selbstlimitierender Wachstumsmechanismus. Spezifische Oberflächenliganden tauschen Reaktionen mit sequentiellem Pulsen der jeweiligen Vorstufen aus. Oberflächenreaktionen stoppen und sättigen, wenn die reaktiven Stellen der Oberfläche vollständig aufgebraucht sind. Das ALD-Wachstum von Dünnfilmen hat Vorteile wie eine überlegene konforme Abscheidung auf Oberflächen und Seitenbereichen, hervorragende Stufenabdeckungen von Kanten, hohe Gleichmäßigkeit über eine große Fläche, Präzision bei der Schichtdickensteuerung und geeignet für niedrige Abscheidungstemperaturen [7,8,9] .
Starke Oxidationsmittel beeinflussen nicht nur die Materialstrukturen, sondern auch die optoelektrischen Eigenschaften von ALD-abgeschiedenem ZnO. H2 O2 Oxidationsmittel bietet sauerstoffreichere Bedingungen als das üblicherweise verwendete H2 O-Vorstufe zur Passivierung von Defekten Sauerstoffleerstellen (VO ) und Zink-Interstitials (Zni ) in ALD-gewachsenen ZnO-Filmen bei niedrigen Wachstumstemperaturen von 80 bis 150 °C. Säulenförmige Oberflächenmorphologien mit (002)-Vorzugsorientierung der Wachstumsebene traten auf, wenn die Verwendung von Oxidationsmittel von H2 . geändert wurde O bis H2 O2 [2]. H2 O2 Oxidationsmittel erhöht die Wachstumsraten um ca. 70 % im Vergleich zur Verwendung von O3 Gasreaktant von ALD-gezüchtetem ZnO bei 200 °C. Der Anstieg der Hydroxyl(OH)-Gruppendichte auf der wachsenden Oberfläche der Filme ist für die Zunahme der Wachstumsraten verantwortlich [3]. Die Steigerung der Wachstumsrate von ZnO um etwa 60 % bei Verwendung von reinem O2 statt H2 Auch O als Oxidationsmittel wird berichtet [4].
O3 ist ein wirksames Oxidationsmittel in ALD-gewachsenen Oxidmaterialien. Das hohe elektrochemische Potenzial von O3 führt zu schnellen Reaktionsgeschwindigkeiten bei niedriger Wachstumstemperatur. O3 ist flüchtiger als H2 O, H2 O2 , und O2 , und es ist einfacher zu reinigen. Daher können die Spülzeiten in jedem Zyklus verkürzt werden. Die Abwesenheit von Wasserstoff in O3 -Molekül führt zu weniger Wasserstoff- und Hydroxyl-Kontaminationen im Wachstum. Eine weniger gleichmäßige Dicke aufgrund des rekombinativen Oberflächenverlusts von ZnO wird für 10 s von O3 . gezeigt Expositionszeiten, wenn das Wachstum bei 200 °C liegt [5]. ALD-präparierte undotierte ZnO-Filme mit O3 Oxidationsmittel zeigen einen doppelten thermoelektrischen Leistungsfaktor im Vergleich zu Proben mit H2 O Oxidationsmittel. H2 O- und O3 -gewachsene ZnO-Filme haben die gleichen Fehlerniveaus von VO aber unterschiedliche Zn-bezogene Defektniveaus. Ausreichende Oxidationskraft des O3 führt zu einem geringeren Gehalt an nativem Zni und daher ein größerer thermoelektrischer Leistungsfaktor. Starke Oxidationswirkung von O3 erhöht die thermoelektrische Leistung von undotierten ZnO-Filmen [6]. Co-Dosierung O3 und H2 O könnte die Gleichmäßigkeit und Konformität von ZnO-Dünnfilmen für geeignete ALD-Prozesse verbessern [5].
Intrinsische und extrinsische Belastungen existieren in ZnO-Filmen, die auf natürliche Weise auf einem Saphirsubstrat gewachsen sind. Die intrinsische Spannung entsteht durch kristallographische Unvollkommenheiten hoher Dichte in ZnO. Zu den kristallographischen Unvollkommenheiten gehören Wasserstoffkomplexe, Zink-Zwischengitter (Zni ), Sauerstoff-Leerstellen (VO ), Gewindeversetzungen (TDs) und Korngrenzen (GBs) [10,11,12,13,14,15,16,17,18,19,20,21]. Extrinsische Spannung wird durch eine große Fehlanpassung von Gitterkonstanten und Wärmeausdehnungskoeffizienten zwischen der ZnO-Epischicht und dem Saphirsubstrat erzeugt. Es werden verschiedene Methoden angewendet, um die intrinsische und extrinsische Spannung von ZnO-Materialien auf Saphiren zu verringern. Eine dünne MgO-Pufferschicht kann extrinsische Spannungen verringern, die Oberflächenrauheit um 58,8 % reduzieren und Oberflächenrisse des dünnen ZnO-Films auf Saphir unterdrücken [22]. Die extrinsische Spannung von ZnO auf Saphir wird vollständig entspannt, wobei die Dicke 30 nm erreicht, hergestellt durch Magnetron-Sputter-Abscheidung bei 550 °C [23]. Eine Entspannung der Druckspannung von 1,77 auf 1,47 GPa von ZnO-Filmen, die durch das Sprühpyrolyseverfahren abgeschieden wurden, mit dem Anstieg der Glassubstrattemperaturen von 350 auf 450 °C wird gezeigt [24].
ALD ZnO, gezüchtet bei 180 °C mit einpulsigen Vorstufen (DEZn und H2 .) O) zeigt eine Hintergrundelektronenkonzentration von ~ 10 18 cm −3 sogar mit post-deposition TA [25]. Häufig verwendetes einpulsiges H2 O-Vorläufer von ALD-Prozessen erzeugen keine ideale Monoschicht von Sauerstoffatomen. Dreipulsige Vorstufen (DEZn und H2 .) O) könnte mehrere Treffer oder Kollisionen von Vorläufermolekülen mit Oberflächenliganden erzeugen, um die Reaktionswahrscheinlichkeit für das bei einer niedrigen Temperatur von 100 °C gewachsene ALD ZnO zu erhöhen. Die Wahl von „drei“ Pulsen hilft, die Reaktanten richtig zu lokalisieren, um die offene Chemisorptions- oder Reaktionsstelle zu lokalisieren. Extrem niedrige Hintergrundelektronenkonzentration 8,4 × 10 14 cm −3 , hohe Elektronendriftmobilität 62,1 cm 2 /Vs, und eine ausgeprägte Verstärkung der Photolumineszenz (PL) der nahen Bandlückenkante (NBE) von drei gepulsten Vorstufen ZnO mit geeigneten Pufferschicht- und RTA-Bedingungen werden erfasst [26]. Mehrere Berichte zeigen eine Verbesserung der Materialqualität von ZnO-Dünnschichten und ZnO/ZnMgO-Mehrfachquantenquellen durch thermisches Ausheilen [27, 28]. In diesem Bericht drei gepulste O3 und anschließendes einpulsiges H2 O als Oxidationsmittel pro ALD-Zyklus werden verwendet, um ZnO-Dünnfilme bei 180 °C zu züchten. Um die kristalline Qualität der Proben zu verbessern, wird ein thermisches Glühen nach der Abscheidung (TA) angewendet. Materialmikro- und Nanostruktur, Photolumineszenz und Hall-Effekt-Merkmale von ALD-gezüchteten ZnO-Dünnschichten werden untersucht.
Experimentelle Methoden
ZnO-Epischichten werden auf konventionellem Saphir mit c-Fläche (c-Al2 O3 ) Substrate durch das Cambridge NanoTech Savannah 100 ALD-System. Beim Wachstum von ALD-ZnO-Dünnschichten werden Vorläufer wie deionisiertes (DI) H2 O, O3 , und Diethylzink (DEZn, Zn(C2 H5 )2 ) verwendet werden. Tabelle 1 zeigt die Bedingungen der Pulszahl von O3 und TA nach der Abscheidung von drei Proben, die A, B und C genannt werden. Ein schematisches Diagramm der Impulsfolge mit der Zeit pro ALD-Zyklus von Proben ist in Fig. 1 dargestellt. In dieser Figur enthält ein ALD-Zyklus sechs sequentielle Schritte. Der erste Schritt ist die Injektion von einpulsigem deionisiertem (DI) H2 O in einen Reaktor im Metermaßstab, um eine Hydroxyl-(OH)-terminierte Oberfläche auf Saphir herzustellen oder mit den baumelnden Ethylgruppen (C2 H5 ) Bildung von Zink-Sauerstoff-(Zn-O)-Brücken auf der Zn-Oberfläche mit Hydroxyl-Oberflächengruppen. Es entsteht eine atomare Sauerstoffschicht (O). Der zweite Schritt ist die Spülung mit hochreinem Stickstoffgas (N2 ), um überschüssige Vorläufermoleküle und flüchtige Nebenprodukte zu entfernen und das Vermischen nachfolgender Vorläufer nach jedem Aussetzen von Reaktanten zu verhindern. Der dritte Schritt ist die Injektion von drei gepulstem O3 in Reaktoren, um die Reduktion nativer Defekte zu erleichtern. Der vierte Schritt ist die Spülung der Kammer um N2 Gas. Der fünfte Schritt ist die Injektion von ein-gepulstem DEZn in Reaktoren, um eine atomare Zinkschicht (Zn) auf der Sauerstoffschicht zu erzeugen. Der letzte Schritt ist auch die Spülung der Kammer um N2 Gas. Vorläufer, die durch das Trägergas N2 . in die Reaktionskammer gepulst werden mit einem Kammerdruck von 4 × 10 −1 Torr. Die optimale Bedingung der Expositionszeit für die Reaktanten DI H2 O, O3 und DEZn 0,01, 0,5 bzw. 0,015 s beträgt. Die Pulszeit der Evakuierung der Kammer beträgt 5 s. Die Dicke der ZnO-Dünnfilme beträgt 85 nm mit 500 ALD-Zyklen jeder Probe. Andere günstige Bedingungen der Ablagerungsparameter sind in den vorherigen Berichten gezeigt [29]. TA nach der Abscheidung bei 300 °C in der Umgebung von O2 für 1 h in einem Ofen wird an Probe C bearbeitet.
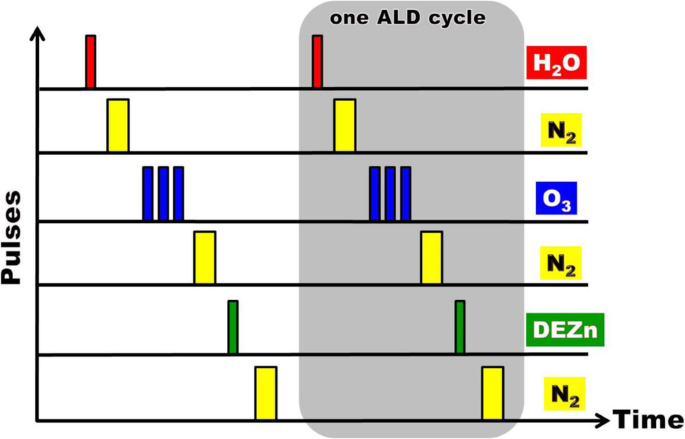
ALD-gewachsene ZnO-Schichten auf Saphir-Substraten mit Pulssequenz H2 O/N2 /O3 /N2 /DEZn/N2 mit DI-Wasser, O3 , und Zn(C2 H5 )2 als Vorläufer
Strukturelle, optische und elektrische Materialeigenschaften von Proben werden durch die folgenden Messungen bestimmt. Die Röntgenbeugungsmuster (XRD) werden mit dem Beugungswinkel (2θ ) im Bereich von 33 bis 38° und einer Wellenlänge von 0,154 nm der Kupfer-Kα-Strahlung unter Verwendung des Instruments D2-Phaser (Bruker Corporation). Die Hall-Effekt-Messung verwendet das Ecopia HMS-3000-System und die Proben werden in Quadrate mit einer Größe von 0,7 × 0,7 cm 2 . geschnitten . Vier Ecken der Proben sind mit kleinen Indium-Klecksen verlötet, die ohmsche Kontakte in van der Pauw-Konfiguration zeigen. Blattträgerdichte, Mobilität und spezifischer Widerstand der Filme werden gemessen. Photolumineszenz(PL)-Spektren werden von 10 bis 300 K mit einer Anregungswellenlänge von 325 nm und einer Leistung von 55 mW des He-Cd-Lasers durchgeführt. Thermisches Quenchen der integrierten Intensität von PL-Spektren bei Temperaturerhöhung wird analysiert. Oberflächentextur und Rauheit von Proben, die aus hochauflösenden Bildern des Rasterkraftmikroskops (AFM) untersucht wurden, werden mit dem Instrument von Veeco Dimension 3100 aufgenommen.
Ergebnisse und Diskussion
Abbildung 2 zeigt die kristalline Natur der Proben durch die Messung von XRD-Mustern. Zwei Bragg-Beugungspeaks (002) und (101) entsprechen der hexagonalen Wurtzit-Struktur von ZnO. Die stärkste Spitzenintensität von XRD-Mustern wird zum Vergleich der Spitzenintensität zwischen den Proben normalisiert. Zwei grüne Pfeile auf der oberen horizontalen Achse zeigen die Beugungswinkel 34,4° und 36,2° von (002) bzw. (101) von spannungsfreiem Bulk-ZnO, gewonnen aus den Materialdatensätzen, die von der Organisation des Joint Committee on Powder Diffraction veröffentlicht wurden Standards (JCPDS). In der Abbildung kann man die (002)- und (101)-Peaks in Probe B und C beobachten und weitere Annäherungs-Beugungswinkel von (002) und (101) von spannungsfreiem ZnO.

XRD-Muster von ZnO-Filmen mit kristallinen Orientierungen entlang der (002)- und (101)-Richtungen der Proben. Die Pfeile zeigen die Beugungswinkel 34,4° und 36,2° von (002) bzw. (101) von Bulk-ZnO an
Biaxiale Dehnung entlang des c -Achse der Epitaxieschichten kann durch die Verschiebung von XRD-Mustern entlang (002) im Gegensatz zu spannungsfreiem Bulk-ZnO erhalten werden. Durchschnittliche Belastung (ε z ) im Gitter von ZnO-Filmen wird aus den Gitterparametern unter Verwendung des folgenden Ausdrucks abgeschätzt.
$$ {\varepsilon}_z=\frac{c-{c}_0}{c_0}\mal 100\% $$ (1)wo c und c 0 sind die Gitterkonstanten entlang der c -Achse berechnet aus Braggs Beugungswinkeln von (002)-Peaks von ZnO-Filmen und Volumen. Die durchschnittliche Belastung (σ ) in der Filmebene kann mit dem biaxialen Dehnungsmodell berechnet werden:
\( \sigma =\frac{2{c}_{13}^2-{c}_{33}\left({c}_{11}+{c}_{12}\right)}{c_ {13}}\times {\varepsilon}_z=-453.6\times {\varepsilon}_z\left(\mathrm{GPa}\right)\) (2) wobei c 11 =209,7 GPa, c 12 =121,1 GPa, c 13 =105,1 GPa und c 33 =210,9 GPa sind die elastischen Steifigkeitskonstanten von massivem ZnO. In Tabelle 1 sind die Dehnungen/Spannungen (ε z /σ ) der A-, B- und C-Proben sind 1,08%/4,90 GPa, 0,74%/3,37 GPa bzw. 0,49%/2,22 GPa. Belastung/Belastung wird in den Proben B und C reduziert und weiter reduziert.
Die PL-Spektren bei verschiedenen Temperaturen von 10 bis 300 K der Proben sind in Abb. 3 dargestellt. In den PL-Spektren aller Proben dominiert eine starke strahlende Rekombination von Exzitonen nahe der Bandkante mit einer spektralen Spitzenenergie um 3,34 eV. Longitudinal-optische (LO) Phononen-unterstützte optische Emission wird an der unteren Energieschulter der PL-Spektren von Proben beobachtet. In Abb. 4a–c zeigt es den Arrhenius-Plot der integrierten Intensität von PL-Spektren gegen den Kehrwert der Temperatur. Das thermische Abschrecken der integrierten Intensität von PL mit steigender Temperatur kann durch die folgende Arrhenius-Formel angepasst werden.
$$ I(T)=\frac{A}{1+{D}_{nr1}\exp \left(\frac{-{E}_{A1}}{k_{\textrm{B}}T} \right)+{D}_{nr2}\exp \left(\frac{-{E}_{A2}}{k_{\mathrm{B}}T}\right)} $$ (3)wo ich (T ) repräsentiert die integrierte PL-Intensität. A ist eine Konstante. D Nr 1 und D Nr 2 sind Konstanten, die sich auf die Dichte nichtstrahlender Rekombinationszentren beziehen. E A 1 und E A 2 sind die Aktivierungsenergien, die dem nichtstrahlenden Rekombinationsprozess von Donor-gebundenen Exzitonen bei niedriger Temperatur bzw. freien Exzitonen bei hoher Temperatur entsprechen. k B ist die Boltzmann-Konstante. Die Methode der kleinsten Quadrate in der Regressionsanalyse wird verwendet, um die Daten anzupassen, die die Parameter von D . zeigen Nr 1 , D Nr 2 , E A 1 , und E A 2 mit roten Fittingkurven in Tabelle 2 und Abb. 4a–c. Das Anpassungsergebnis zeigt, dass Variationen von D Nr 1 , E A 1 , und E A 2 unter den Proben sind Licht. D Nr 2 sind 132,7, 153,6 und 110,8 der Proben A, B bzw. C, was einen großen Unterschied in der Menge der Defektdichte zeigt. Der kleinste Wert von D Nr 2 weist auf die niedrigste Dichte thermisch aktivierter Defekte in Probe C hin.
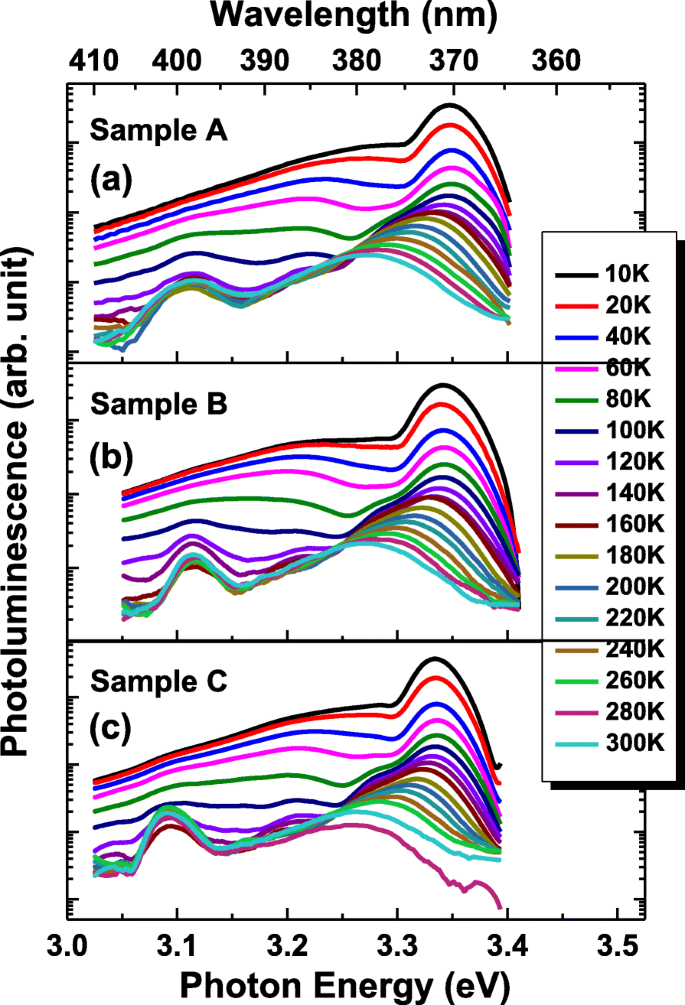
a –c Temperaturabhängige PL-Spektren von Proben
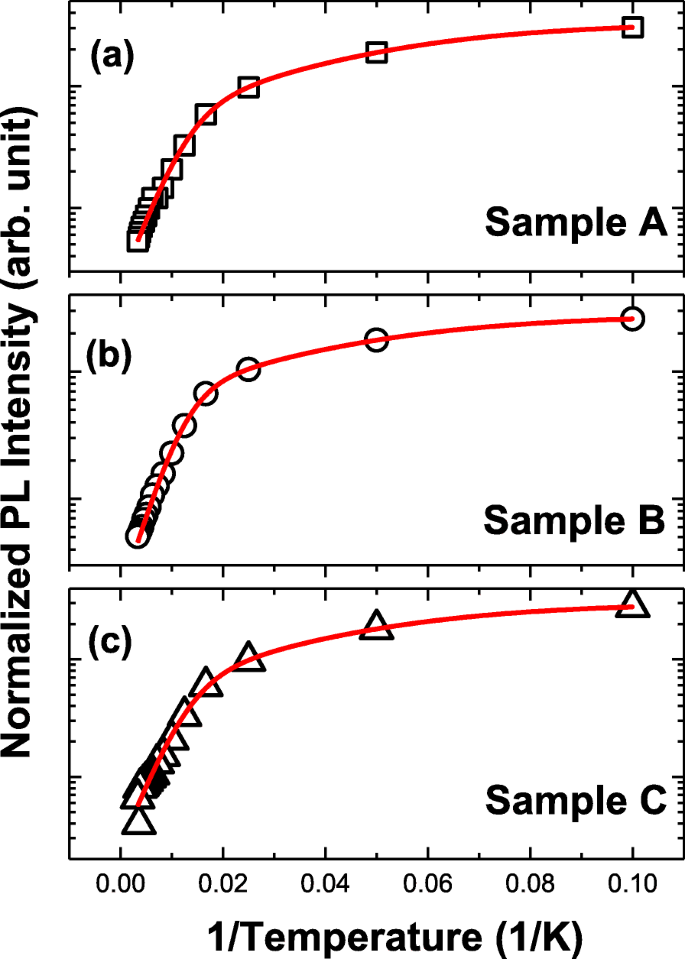
a –c Arrhenius-Diagramme des thermischen Quenchens der integrierten Intensität von PL-Spektren und rote Anpassungskurven von Proben
Hintergrundelektronenkonzentration, Mobilität und spezifischer Widerstand von Hall-Effekt-Messungen von Proben sind in Tabelle 2 aufgeführt. In Probe B ist eine Abnahme der Ladungsträgerkonzentration um zwei Größenordnungen mit einer Abnahme der Mobilität im Vergleich zu Probe A gezeigt. Eine weitere immense Abnahme der Ladungsträgerkonzentration auf den niedrigsten Wert von 9,4 × 10 15 cm −3 und der Anstieg der Mobilität auf einen Wert von 6,1 cm 2 /Vs werden in Probe C im Vergleich zu Probe B beobachtet. Die geringste Elektronenkonzentration ist auf die größte Relaxation der Dehnungs-/Spannungszustände und eine bemerkenswerte Verringerung der nativen Defektdichte in Probe C zurückzuführen.
Die Abbildungen 5a–c und d–f sind 2D- und 3D-AFM-Bilder von Proben. Der quadratische Mittelwert (RMS) der Rauheit von A, B und C beträgt 1,92, 4,30 bzw. 2,18 nm, wie in Tabelle 2 gezeigt. Die niedrigste Oberflächenrauheit trat in Probe A auf. Bei Verwendung von O3 Vorläufer in Probe B wird die Oberflächenrauheit erhöht. Die Verringerung der räumlichen Gleichmäßigkeit der ALD-ZnO-Filme ist auf den Oberflächenverlust von O3 . zurückzuführen [21]. Oberflächenverlust von O3 hängt mit dem Übergang von reaktions- zu rekombinationsbegrenztem Wachstum zusammen und kann den primären Atomverlustkanal bilden, um die Filme zu zerstören, was zu einer schlechten Dickengleichmäßigkeit führt. Dies korreliert mit der Verringerung der Beugungspeakintensität entlang (002) in Probe B in Fig. 2. Mit der Behandlung von TA nach der Abscheidung in Probe C wird die Oberflächengleichmäßigkeit verbessert. Inzwischen werden eine dramatische Verringerung der Hintergrundelektronenkonzentration und eine Erhöhung der Mobilität erreicht. Thermisches Glühen bewirkt Migration im Kristallgitter; somit findet eine metallurgische Rekristallisation statt. Die Rekristallisation begleitet die Verringerung der Festigkeit von Dehnung/Spannung und intrinsischen Kristallgitterfehlern; daher wird eine bessere Qualität des ZnO-Dünnfilms erreicht. Dieses Ergebnis steht im Einklang mit der Verstärkung von zwei Beugungspeakintensitäten im XRD-Muster in Probe C. Es ist erwähnenswert, dass die Mobilität der Elektronen durch Streuquellen wie Verunreinigungen, Gitter und Defekte beeinflusst werden kann. Diese Streuquellen könnten die durchschnittliche Elektronengeschwindigkeit verändern. Im Allgemeinen führt eine Verringerung der Defektdichte und damit eine Verringerung der Elektronenkonzentration zu einem Anstieg der Mobilität. In diesem Bericht könnte eine Zunahme der Rauhigkeit der Oberflächentextur aufgrund der Wirkung der Dosierung von Ozonvorläufern eine geringere Elektronenmobilität in Probe C als in Probe A bewirken Verarbeitungsbedingungen zur Erzielung hochwertiger ALD-ZnO-Epischichten in diesem Bericht.
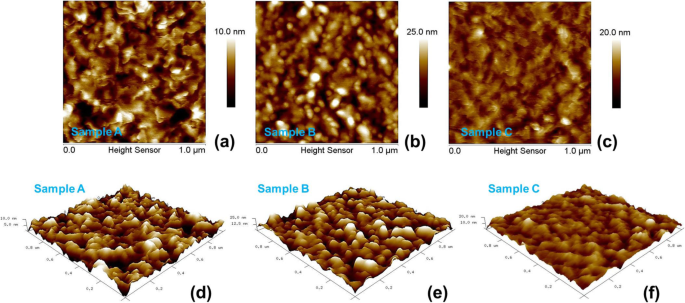
a –c 2D und d –f 3D-AFM-Bilder von Proben. Die Höhenskala in 2D-Bildern wird in der rechten Farbleiste angezeigt

Ein Pyramidendiagramm. In der Pyramide sind vier Dreiecke in verschiedenen Farben abgebildet. Drei Dreiecke an den Rändern der Pyramide zeigen die wichtigsten Wachstums- und Verarbeitungsbedingungen von ZnO. Die Kombination dieser drei entscheidenden Wachstumskomponenten fördert die Qualität der ALD-ZnO-Epischichten, dargestellt durch das Dreieck in der Mitte der Pyramide
Schlussfolgerungen
Einpulsiges H2 O und drei gepulstes starkes Oxidationsmittel O3 Vorläufer in den ALD-Prozessen können die Spannung/Spannung verringern und somit die Elektronenkonzentration in der ZnO-Dünnschicht deutlich reduzieren, aber die Oberflächenrauheit erhöhen. Post-Deposition TA bei 300 °C in der Umgebung von Sauerstoff (O2 ) für 1 h kann die Bildung defektfreierer Körner mit geringerer Spannung/Spannung, niedrigerer Hintergrundelektronenkonzentration und Verbesserung der Oberflächenrauheit nach dem Wachstum unter Verwendung von drei gepulstem O3 . weiter erleichtern Vorläufer. Die niedrigste Dehnung/Spannung und Hintergrundelektronenkonzentration, die 0,49 %/2,22 GPa und 9,4 × 10 15 . beträgt cm −3 , bzw. aufgrund der dramatischen Abnahme des intrinsischen nativen Defekts von ALD-gewachsenen ZnO-Dünnschichten erreicht werden.
Verfügbarkeit von Daten und Materialien
Die Daten, die die Ergebnisse dieser Studie stützen, sind auf begründete Anfrage beim entsprechenden Autor (Yung-Chen Cheng) erhältlich.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- O3 :
-
Ozon
- TA:
-
Thermisches Glühen
- O2 :
-
Sauerstoff
- PL:
-
Photolumineszenz
- H2 O:
-
Wasser
- H2 O2 :
-
Wasserstoffperoxid
- OH:
-
Hydroxyl
- Zni :
-
Zink-Interstitials
- VO :
-
Sauerstoff offene Stellen
- TDs:
-
Einfädeln von Versetzungen
- GBs:
-
Korngrenzen
- NBE:
-
Nahe der Bandlückenkante
- c-Al2 O3 :
-
c-face saphir
- DI:
-
Entionisiert
- C2 H5 :
-
Ethylgruppen
- N2 :
-
Stickstoffgas
- Zn:
-
Zink
- XRD:
-
Röntgenbeugung
- AFM:
-
Rasterkraftmikroskop
- RMS:
-
Quadratischer Mittelwert
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Untersuchung der Adhäsionskraft und des Glasübergangs dünner Polystyrolfolien durch Rasterkraftmikroskopie
- Vorbereitung und thermoelektrische Eigenschaften von ITO/PtRh:PtRh-Dünnschicht-Thermoelementen
- Eine bequeme und effektive Methode zum Abscheiden von nc-Si:H-Dünnfilmen mit geringer Defektdichte durch PECVD



