Über die p-AlGaN/n-AlGaN/p-AlGaN-Stromaufweitungsschicht für AlGaN-basierte tief ultraviolette Leuchtdioden
Zusammenfassung
In diesem Bericht wurden AlGaN-basierte tief-ultraviolette Leuchtdioden (DUV LEDs) mit unterschiedlichen p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN) strukturierten Stromaufweitungsschichten beschrieben und untersucht. Nach unseren Ergebnissen kann die verwendete PNP-AlGaN-Struktur eine Energiebarriere in der Lochinjektionsschicht induzieren, die die laterale Stromverteilung modulieren kann. Wir stellen auch fest, dass der Stromverteilungseffekt stark von der Dicke, der Dotierungskonzentration, der PNP-Schleife und der AlN-Zusammensetzung für die eingefügte n-AlGaN-Schicht beeinflusst werden kann. Wenn die PNP-AlGaN-Struktur richtig ausgelegt ist, können daher die Durchlassspannung, die externe Quanteneffizienz, die optische Leistung und die Steckdoseneffizienz für die vorgeschlagenen DUV-LEDs im Vergleich zu den herkömmlichen DUV-LEDs ohne PNP . erheblich verbessert werden -AlGaN-Struktur.
Einführung
Seit dem ersten Auftreten im Jahr 2003 stoßen AlGaN-basierte tief-ultraviolette Leuchtdioden (DUV-LEDs) aufgrund ihres breiten Anwendungsspektrums wie Wassersterilisation und Luftreinigung auf großes Interesse [1,2,3,4,5, 6,7]. Allerdings ist die externe Quanteneffizienz (EQE) für DUV-LEDs kleiner als 10 %, wenn die Emissionswellenlänge kürzer als 300 nm ist [8], was ihre weitere Anwendung erheblich einschränkt. Der niedrige EQE ergibt sich teilweise aus der schlechten internen Quanteneffizienz (IQE). Es wurde viel darauf hingewiesen, dass der IQE durch die Trägerinjektion und die ausgedehnten Versetzungen bemerkenswert beeinflusst wird [8]. AlGaN-basierte DUV-LEDs, die auf isolierenden Saphirsubstraten aufgewachsen sind, verwenden die Flip-Chip-Struktur für eine bessere Lichtextraktionseffizienz. Dennoch erfordert die Flip-Chip-DUV-LED-Struktur, dass sich die n-Elektrode und die p-Elektrode auf derselben Seite befinden. Daher tritt leicht die inhomogene seitliche Stromverteilung auf, d. h. der Stromverdrängungseffekt [9]. Der Strom-Crowding-Effekt kann leicht den lokalen Joule-Heizeffekt und die ungleichmäßige Lichtemission verursachen [10,11,12]. Erwähnenswert ist, dass die lokale Überhitzung die Lebensdauer von DUV-LEDs stark verschlechtert. Darüber hinaus führt die sehr schlechte Mg-Dotierungseffizienz für die Al-reiche p-AlGaN-basierte Lochinjektionsschicht zu der schlechten elektrischen Leitfähigkeit [13], was die Bedeutung für die Verbesserung der Stromspreizung für DUV-LEDs weiter manifestiert. Obwohl Khan et al. haben in ihrem Übersichtsartikel [14] darauf hingewiesen, dass auf das aktuelle Crowding zu achten ist, detaillierte Analysen zum aktuellen Crowding und die Lösungen dafür werden für DUV-LEDs bisher weniger diskutiert.
Für GaN-basierte blaue LEDs wurden umfangreiche Techniken zur Förderung der Stromausbreitung berichtet, und die Stromausbreitung kann beispielsweise durch selektives Ionenimplantation der p-GaN-Schicht [15, 16], Einfügen einer Stromsperrschicht (CBL) verbessert werden. [17,18,19], wodurch selektiv Stickstoff-Leerstellen erzeugt werden, um die Löcher in der p-GaN-Schicht zu kompensieren [20], wodurch der Glühprozess für den ohmschen Kontakt optimiert wird [21]. Neben der Verwendung von Post-Fabrication-Ansätzen kann die Stromaufweitungsschicht auch durch in-situ-Epitaxie in dem metallorganischen chemischen Gasphasenabscheidung (MOCVD)-System erhalten werden. Wichtige Beispiele sind die folgenden:die kurzperiodische p-GaN/i-InGaN-Übergitterstruktur zwischen der Mehrfachquantentopf(MQWs)-Struktur und der p-GaN-Schicht [22, 23], die Tunnelübergänge [24, 25] und die Barriere Kreuzungen [10]. Trotzdem sind selten Berichte über Epi-Strukturen zur Verbesserung der Stromausbreitung für DUV-LEDs zu finden. In diesem Brief schlagen wir vor, eine p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN)-Schicht zu verwenden, um den lateralen Strom für DUV-LEDs besser zu verteilen. Die PNP-AlGaN-Struktur kann die Energiebarriere im Valenzband der Lochinjektionsschicht vom p-Typ erzeugen. Die Energiebarriere kann den spezifischen elektrischen Widerstand für die Lochinjektionsschicht vom p-Typ modulieren, und daher kann der Stromflusspfad abgestimmt werden. Durch geeignetes Entwerfen der PNP-AlGaN-Stromverteilungsschicht können der EQE, der Wandstecker-Wirkungsgrad (WPE) und die Durchlassspannung verbessert werden. Darüber hinaus untersucht diese Arbeit umfassend die Empfindlichkeit der Stromspreizung, des EQE, des WPE und der Durchlassspannung zur PNP-AlGaN-Schleife, der Si-Dotierungskonzentration, der Dicke und der AlN-Zusammensetzung für die eingefügte n-AlGaN-Schicht der PNP-AlGaN-Architektur.
Forschungsmethoden und Physikmodelle
Um die aktuellen Ausbreitungsmechanismen für AlGaN-basierte DUV-LEDs besser zu verdeutlichen, werden verschiedene DUV-LED-Bauelemente entwickelt (siehe Abb. 1a). Alle DUV-LEDs bestehen aus einem 4 µm dicken n-Typ Al0,60 Ga0,40 N-Schicht mit einer Si-Dotierungskonzentration von 5 × 10 18 cm −3 . Als nächstes fünf Perioden von 3-nm Al0,45 Ga0,55 N/12 nm Al0,56 Ga0.44 N MQWs folgen. Dann begrenzen wir die MQWs mit einem 18 nm dicken p-Typ Al0,60 Ga0,40 N-Elektronenblockierschicht (p-EBL), auf der ein 198 nm dickes p-Typ Al0,40 Ga0.60 Als Lochinjektionsschicht werden eine N-Schicht und eine 50 nm dicke p-Typ-GaN-Deckschicht verwendet. Die Lochkonzentration für die p-Typ-Schichten ist auf 3 × 10 17 . eingestellt cm −3 . Für die DUV-LEDs mit den vorgeschlagenen PNP-AlGaN-Strukturen ist das herkömmliche p-Typ-Bulk-Al0,40 Ga0.60 N-Schicht wird durch p-Al0,40 . ersetzt Ga0.60 N/n-Alx Ga1-x N/p-Al0,40 Ga0.60 N-Schicht. Abbildung 1b zeigt das schematische Strukturdiagramm der PNP-AlGaN-Schicht. Abbildung 1c zeigt das schematische Valenzbanddiagramm für die PNP-AlGaN-Struktur, aus dem wir die Barriere für Löcher erkennen können. Die Barriere wird aufgrund der Verarmung der Si-Dotierstoffe im dünnen n-Alx . erzeugt Ga1-x N-Schicht [26]. Diese Barriere ist sehr wichtig bei der Bestimmung des Stromflussweges und der Geräteleistung für DUV-LEDs. Eine detaillierte Analyse folgt anschließend.
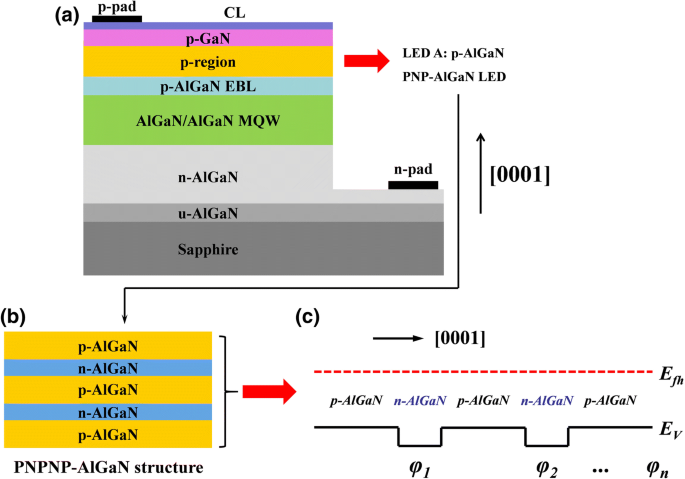
a Schematische Darstellungen der untersuchten Geräte (Referenz-LED A und PNPNP-AlGaN-LED), b schematische Darstellungen der PNP-AlGaN-Struktur mit zwei PNP-AlGaN-Übergängen, c schematisches Valenzbanddiagramm für die PNP-AlGaN-Struktur mit mehreren PNP-AlGaN-Übergängen, in der φ 1 , φ 2 , und φ n bezeichnen die Barrierenhöhe für jeden PNP-AlGaN-Übergang entlang der [0001]-Orientierung und n steht für die Nummer des PNP-AlGaN-Übergangs
Um den Mechanismus der PNP-AlGaN-Struktur bei der Stromverteilung weiter zu veranschaulichen, zeigen wir das vereinfachte Ersatzschaltbild und die Stromflusspfade für die auf Saphirsubstraten aufgewachsene DUV-LED in Abb. 2a. Der Strom fließt sowohl vertikal als auch seitlich vom p-AlGaN-Gebiet zum n-AlGaN-Gebiet. Normalerweise ist die Dicke der Stromausbreitungsschicht (CL) (d. h. 200 nm für unsere Geräte) viel geringer als die der n-AlGaN-Schicht (d. h. 4 μm für unsere Geräte). Daher ist der elektrische Widerstand für die CL viel größer als der für die n-AlGaN-Elektroneninjektionsschicht. Dann neigt der Strom dazu, sich unter die p-Elektrode zu drängen, d. h. J 1> J 2> J 3> J 4> .....> J n , der als aktueller Crowding-Effekt bekannt ist [27]. Glücklicherweise kann der Stromverdrängungseffekt durch Einbau des PNP-AlGaN-Übergangs in die Lochinjektionsschicht vom p-Typ unterdrückt werden, und der zugrunde liegende Mechanismus kann unter Verwendung von Fig. 2b interpretiert werden, sodass wir den Gesamtstrom in einen vertikalen Teil aufteilen ( J 1 ) und einem horizontalen Teil (J 2 ). Nach Ref.-Nr. [27], die Beziehung zwischen J 1 und J 2 kann durch Gl. (1) wie folgt,
$$ \frac{J_1}{J_2}\cong \frac{l}{\frac{\rho_p}{\rho_{\mathrm{CL}}}{t}_p+\frac{N\cdot {\rho}_ {\mathrm{PNP}}}{\rho_{\mathrm{CL}}}}, $$ (1)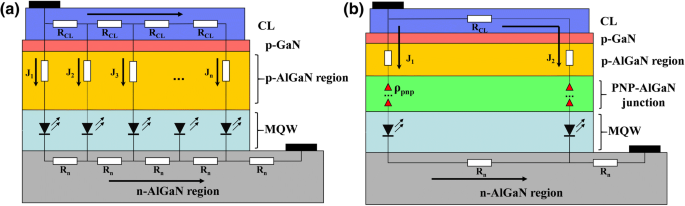
a Ersatzschaltbild von DUV-LEDs mit lateralem Strominjektionsschema (J 1> J 2> J 3> J 4> …… > J n ) und b vereinfachtes Ersatzschaltbild der LED mit PNP-AlGaN-Struktur, die Strompfade (J 1 und J 2 ) werden auch angezeigt
wo l ist die Länge des horizontalen Strompfades, t p ist die Dicke, ρ p steht für den vertikalen spezifischen Widerstand für die Lochinjektionsschicht vom p-Typ, ρ CL bezeichnet den spezifischen Widerstand der ex situ abgeschiedenen Stromaufweitungsschicht, ρ PNP bedeutet den spezifischen Grenzflächenwiderstand, der in jedem PNP-AlGaN-Übergang induzierter wird, und N stellt die Nummer des PNP-AlGaN-Übergangs dar. Basierend auf Gl. (1), folgern wir, dass wir J . erhöhen können 2 durch Reduzierung von ρ CL . Gleichung (1) zeigt auch, dass die richtige Erhöhung des vertikalen Widerstands (d. h. ρ p × t p ) hilft auch, J . zu verbessern 2 . Alternativ kann der vertikale Widerstand durch Einbeziehung von N·ρ . größer werden PNP . Der Wert von N·ρ PNP kann durch die Anzahl der PNP-AlGaN-Übergänge beeinflusst werden. Außerdem ist der Wert von ρ PNP ist abhängig von der Dotierungskonzentration, der Dicke und der AlN-Zusammensetzung des n-Alx Ga1-x N-Schicht. Daher werden nachfolgend Details bezüglich verschiedener PNP-AlGaN-Übergänge diskutiert.
Untersuchungen zur Gerätephysik werden mit APSYS durchgeführt [28]. Das Energieband-Offset-Verhältnis zwischen dem Leitungsband-Offset und dem Valenzband-Offset für den AlGaN/AlGaN-Heteroübergang wird auf 50:50 eingestellt [29]. Zur Berechnung der polarisationsinduzierten Ladungen an den gitterfehlangepassten Grenzflächen wird das Polarisationsniveau auf 40% gesetzt [30, 31]. Der Auger-Rekombinationskoeffizient und die Shockley-Read-Hall (SRH)-Rekombinationslebensdauer werden auf 1,0 × 10 –30 . eingestellt cm 6 /s [27] bzw. 10 ns [32]. Die Lichtextraktionseffizienz wird für DUV-LEDs auf ~ 8% eingestellt [33]. Andere Parameter an stickstoffhaltigen III–V-Halbleitern finden sich an anderer Stelle [34].
Ergebnisse und Diskussionen
Nachweis der Wirksamkeit des PNP-AlGaN-Übergangs bei der Stromverteilung für DUV-LEDs
Um die Wirksamkeit der PNP-AlGaN-Struktur bei der Stromverteilung für DUV-LED zu zeigen, sind die Referenz-DUV-LED (dh LED A) ohne PNP-AlGaN-Struktur und die DUV-LED mit der PNP-AlGaN-Struktur (dh LED B) studiert. Beachten Sie, dass die Architekturinformationen für die DUV-LEDs im Abschnitt Forschungsmethoden und Physikmodelle mit Ausnahme der PNP-AlGaN-Konfiguration für LED B angegeben wurden. LED B hat zwei PNP-AlGaN-Schleifen, d. h. eine PNPNP-AlGaN-Struktur. Jeder PNP-AlGaN-Übergang umfasst das p-Al0,40 Ga0.60 N/n-Al0,40 Ga0.60 N/p-Al0,40 Ga0.60 N-Struktur, für die die Si-Dotierungskonzentration im 20 nm dicken n-Al0,40 Ga0.60 N-Einfügungsschicht ist 5.3 × 10 17 cm −3 . Wir berechnen und zeigen das Energiebanddiagramm für LED B bei der Stromdichte von 170 A/cm 2 in Abb. 3a. Wir können sehen, dass die Löcher im Vergleich zu LED A (Energieband hier nicht gezeigt) auf zwei Barrieren stoßen, bevor sie in die MQWs injiziert werden. Die Barrieren im Valenzband können hier den Strom effektiv verteilen und die Löcher seitlich besser homogenisieren. Um weiter auf unseren Punkt einzugehen und zu Demonstrationszwecken zeigen wir das seitliche Lochkonzentrationsprofil in dem Quantentopf, der dem p-EBL am nächsten liegt [dh dem letzten Quantentopf (LQW)] in Abb. 3b, der feststellt, dass die Lochverteilung in LED B zeigt tatsächlich ein gleichmäßigeres Profil im LQW. Die Beobachtungen in Abb. 2b stimmen gut mit den Energiebanddiagrammen in Abb. 3a und unserer vorherigen Analyse überein, sodass sich die PNP-AlGaN-Struktur bei der Verbesserung des Stromausbreitungseffekts als nützlich erweist.
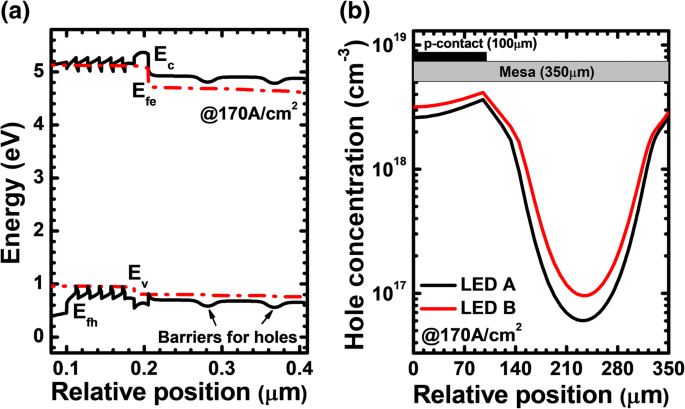
a Energiebanddiagramm für LED B bei einer Stromdichte von 170 A/cm 2 . E c , E v , E fe , und E fh bezeichnen das Leitungsband, das Valenzband und die Quasi-Fermi-Niveaus für Elektronen bzw. Löcher, b Laterale Lochverteilung im letzten Quantentopf für LEDs A und B bei der Stromdichte von 170 A/cm 2 , bzw.
Als Nächstes zeigen wir die Profile für die Lochkonzentration und die Strahlungsrekombinationsrate im MQW-Bereich für die LEDs A und B in Abb. 4a bzw. b. Beachten Sie, dass zur Überwachung des aktuellen Spreizeffekts die Daten in Fig. 4a, b an einer Position von 230 μm von der linken Mesakante entfernt erfasst werden. Es hat sich herausgestellt, dass die verbesserte Stromspreizung für LED B auch die geförderte Lochinjektion in die MQWs ermöglicht. Die Verbesserung der Lochkonzentration in den MQWs erzeugt die erhöhte Strahlungsrekombinationsrate für LED B gemäß Abb. 4b.

a Lochkonzentrationsprofile und b Strahlungsrekombinationsrate im MQW-Bereich für LEDs A und B bei einer Stromdichte von 170 A/cm 2 , bzw.
Abbildung 5a zeigt dann den EQE und die optische Leistungsdichte in Bezug auf das Injektionsstromdichteniveau für die LEDs A und B. Die EQE-Werte für die LEDs A und B betragen 3,38 % bzw. 4,13 %, was eine Leistungssteigerung von 22,2 % bei . ergibt die Stromdichte von 170 A/cm 2 . Diese beobachteten Verbesserungen werden dem besseren Stromverteilungseffekt und der verbesserten Lochinjektion in die MQW-Region für LED B zugeschrieben. Wie bereits erwähnt, kann die Übernahme der PNP-AlGaN-Struktur zu einer Energiebarriere im Valenzband führen, die kann die Durchlassspannung beeinflussen. Die Spekulation wird unter Bezugnahme auf Abb. 5b bewiesen, die die leicht erhöhte Durchlassspannung für LED B demonstriert. Trotz der höheren Durchlassspannung für LED B ist die Steckdoseneffizienz für LED immer noch größer als die für LED A gemäß Abb. 5c , sodass die Zahlen 3,56 % und 4,27 % für die LEDs A und B bei der aktuellen Dichte von 170 A/cm 2 . betragen , bzw. Wenn wir Fig. 5a, c weiter vergleichen, können wir feststellen, dass das WPE für LED B einen ausgeprägteren Abfall aufweist, und dies wird dem zusätzlichen Spannungsabfall am PNP-AlGaN-Übergang zugeschrieben. Daher ist es im Wesentlichen wichtig, eine umfassendere Studie durchzuführen, die die Empfindlichkeit des EQE, der Durchlassspannung und des WPE gegenüber verschiedenen PNP-AlGaN-Designs aufzeigt.
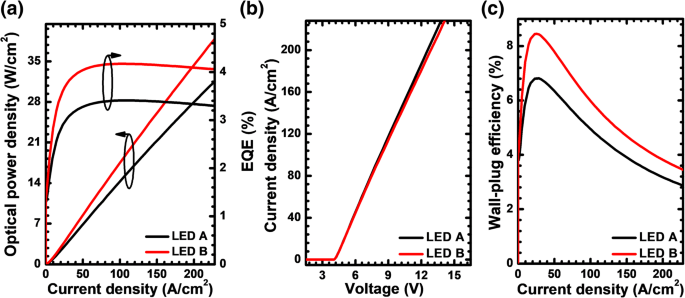
a Optische Ausgangsleistungsdichte und EQE als Funktion des Injektionsstroms, b Strom-Spannungs-Kennlinie, c WPE in Bezug auf den Injektionsstrom für die LEDs A bzw. B
Einfluss der Dicke der n-AlGaN-Schicht auf die Geräteleistung
Nach Gl. (1), können wir schlussfolgern, dass ein verbesserter horizontaler Stromfluss durch Erhöhen des Wertes von N·ρ . erreicht werden kann PNP . Die Barrierehöhe im PNP-AlGaN-Übergang nimmt zu, wenn n-Al0,40 Ga0.60 N-Schicht wird dick, sodass ein größeres ρ PNP erhalten werden, was für den verbesserten Stromaufweitungseffekt von Vorteil ist. Sobald jedoch n-Al0,40 Ga0.60 N-Schicht ist zu dick, mehr Löcher im p-Al0,40 Ga0.60 Die N-Schicht kann verarmt sein, was die elektrische Leitfähigkeit opfern kann. Um die Beziehung zwischen der Dicke von n-Al0,40 . besser zu veranschaulichen Ga0.60 N-Schicht und Leistung für DUV-LEDs ist es notwendig, die Auswirkungen von n-Al0,40 . zu untersuchen Ga0.60 N-Schichtdicke für den PNP-AlGaN-Übergang bei der Stromaufweitung, der Lochinjektion, der EQE, der Durchlassspannung und der WPE. Dazu variieren wir die Werte von n-Al0,40 Ga0.60 N-Schichtdicke zwischen 6, 13, 20, 27 und 34 nm, und die Geräte werden als LEDs T1, T2, T3, T4 bzw. T5 bezeichnet. Tabelle 1 fasst die Höhe der Valenzbandbarriere für jeden PNP-AlGaN-Übergang zusammen, was zeigt, dass die Barrierenhöhe mit n-Al0,40 . zunimmt Ga0.60 Die N-Schichtdicke nimmt zu, was beweist, dass die Zunahme von n-Al0,40 Ga0.60 N Schichtdicke ermöglicht die große N·ρ PNP , wodurch der horizontale Strom J . erhöht wird 2 . Abbildung 6a zeigt dann die Profile der lateralen Lochkonzentration im letzten Quantentopf für LED A ohne die strukturierte PNP-AlGaN-Stromaufweitungsschicht und die LEDs mit verschiedenen n-Al0,40 Ga0.60 N Schichtdicken bei der Stromdichte von 170 A/cm 2 . Es ist offensichtlich zu sehen, dass die Löcher im letzten Quantentopf gleichmäßiger verteilt werden als die Dicke für das n-Al0.40 Ga0.60 N Einfügungsschicht erhöht.
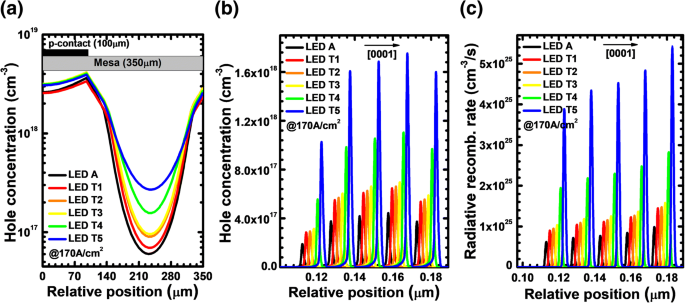
a Laterale Lochverteilung im letzten Quantentopf, b Lochkonzentrationsprofile und c Strahlungsrekombinationsratenprofile im MQW-Bereich für LEDs A, T1, T2, T3, T4 und T5 bei einer Stromdichte von 170 A/cm 2 . Die gezeichneten Kurven für die Paneele b und c werden absichtlich um 2 nm verschoben, um eine bessere Auflösung zu erzielen
Anschließend zeigen wir die Lochkonzentrationsprofile und Strahlungsrekombinationsratenprofile im MQW-Bereich für alle untersuchten Geräte bei einer Stromdichte von 170 A/cm 2 in Abb. 6b bzw. c. Die Lochkonzentrations- und Strahlungsratenprofile werden an einer Position von 230 μm entfernt von der linken Mesakante erfasst. Für eine bessere visuelle Auflösung sind die Lochkonzentrations- und Strahlungsrekombinationsratenprofile für die LEDs A, T1, T2, T3, T4 und T5 in Fig. 6b bzw. c um 2 nm räumlich verschoben. Es zeigt sich deutlich, dass LED A die niedrigste Lochkonzentration und damit die niedrigste Strahlungsrekombinationsrate im MQW-Bereich aufweist. Die Lochkonzentration und die Strahlungsrekombinationsrate in der MQW-Region nehmen mit zunehmender Dicke des n-Al0,40 . zu Ga0.60 N-Schicht.
Die in Abb. 6c gezeigten beobachteten Ergebnisse stimmen gut mit der EQE und der in Abb. 7a dargestellten optischen Leistungsdichte überein, sodass die zunehmende Dicke des n-Al0,40 Ga0.60 Eine N-Schicht im PNP-AlGaN-Übergang kann die EQE und die optische Leistungsdichte verbessern. Die Höhe der Valenzbandbarriere für Löcher in jedem PNP-AlGaN-Übergang wird jedoch groß, sobald n-Al0,40 Ga0.60 Die N-Schicht wird gemäß Tabelle 1 verdickt, was die Durchlassspannung für die vorgeschlagenen DUV-LEDs entsprechend erhöht, wie in Fig. 7b gezeigt. Daher ist der Einfluss des n-Al0,40 Ga0.60 Die N-Schichtdicke für die PNP-AlGaN-Stromverteilung auf die LED-Leistung soll bewertet werden, indem die Beziehung zwischen dem WPE und der Injektionsstromdichte gezeigt wird (siehe Abb. 8). Wir sehen, dass die WPE mit steigendem n-Al0.40 . nicht monoton zunimmt Ga0.60 N Schichtdicke. Die EQE und die WPE in Bezug auf n-Al0,40 Ga0.60 N-Schichtdicken sind im Einschub von Fig. 8 dargestellt. Für die in dieser Arbeit vorgeschlagenen Gerätearchitekturen erreicht die WPE den höchsten Wert, wenn n-Al0,40 Ga0.60 Die N-Einfügungsschicht ist 20 nm dick und nimmt mit n-Al0,40 . ab Ga0.60 Die N-Einfügungsschicht wird dicker. Wir führen dieses Phänomen auf den erhöhten vertikalen Widerstand zurück, wenn der n-Al0,40 Ga0.60 Die N-Schichtdicke wird dicker, und dies verbraucht mehr elektrische Leistung. Daher muss die Dicke der n-AlGaN-Einfügungsschicht für den PNP-AlGaN-Übergang sorgfältig optimiert werden. In diesem Abschnitt setzen wir die AlN-Zusammensetzung auf 40%, d. h. n-Al0,40 Ga0.60 N zu Demonstrationszwecken, und wir glauben, dass die optimierte Dicke für die n-AlGaN-Einfügungsschicht kleiner wird, wenn man die AlN-Zusammensetzung erhöht.
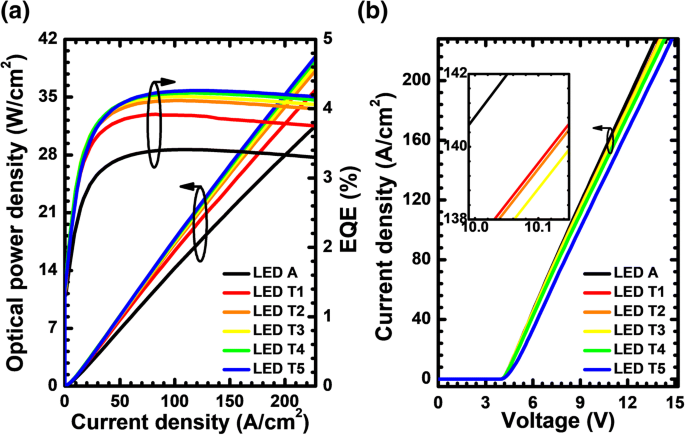
a Optische Ausgangsleistungsdichte, b Strom-Spannungs-Kennlinie für LEDs A, T1, T2, T3, T4 und T5. Die eingefügte Abbildung zeigt die vergrößerten Strom-Spannungs-Kurven
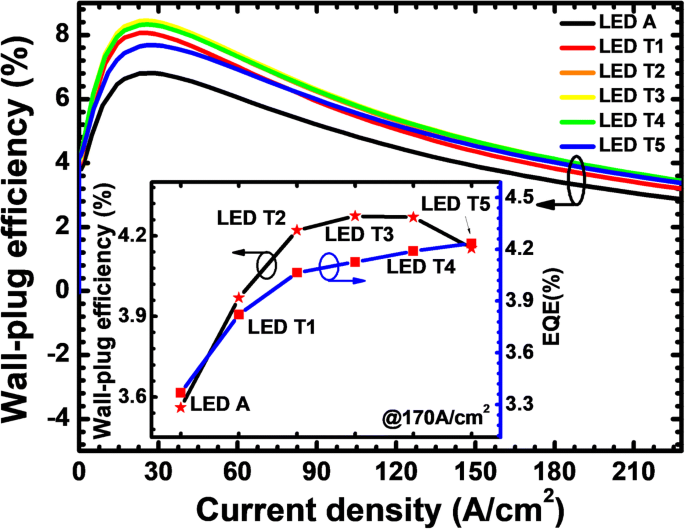
WPE als Funktion des Injektionsstroms für LEDs A, T1, T2, T3, T4 und T5. Die eingefügte Abbildung zeigt die WPE und EQE für die untersuchten LEDs mit verschiedenen Dicken des n-Al0,40 Ga0.60 N-Schicht für den PNP-AlGaN-Übergang bei der Stromdichte von 170 A/cm 2
Einfluss der Dotierungskonzentration der n-AlGaN-Schicht auf die Geräteleistung
Neben der Dicke der n-AlGaN-Schicht kann die Dotierungskonzentration für die n-AlGaN-Schicht auch die Höhe der Valenzbandbarriere für Löcher verändern und somit N·ρ . beeinflussen PNP . Um den Einfluss der Dotierungskonzentration für die n-AlGaN-Schicht auf den Stromausbreitungseffekt und die optische Leistung für DUV-LEDs mit PNP-AlGaN-Übergängen genauer zu untersuchen, haben wir die Dotierungskonzentration auf 1,3 × 10 17 , 5.3 × 10 17 , 9,3 × 10 17 , 1,33 × 10 18 , und 1,73 × 10 18 cm −3 der n-AlGaN-Schichten für LEDs D1, D2, D3, D4 bzw. D5. Die Dicke für die n-AlGaN-Schicht wird auf 20 nm eingestellt, und es werden zwei PNP-AlGaN-Übergänge verwendet. Die AlN-Zusammensetzung beträgt 40%, d. h. n-Al0,40 Ga0.60 N.
Tabelle 2 zeigt, dass die Höhe der Valenzbandbarriere für Löcher zunimmt, wenn die Si-Dotierungskonzentration für n-Al0,40 Ga0.60 Die N-Schicht des PNP-AlGaN-Übergangs wird hoch. Die erhöhte Höhe der Valenzbandbarriere weist auf das große N·ρ . hin PNP , was gleichzeitig den hohen Horizontalstrom von J . ergibt 2 . Nach Gl. (1) wird die erhöhte Stromausbreitung von einem gleichmäßigeren Profil der lateralen Lochkonzentration begleitet, und daher zeigen wir in Fig. 9a, dass die laterale Lochverteilung im letzten Quantentopf homogener wird, sobald PNP-AlGaN Übergang ist für DUV-LEDs im Vergleich zu LED A dotiert. Darüber hinaus werden die seitlichen Löcher gleichmäßiger verteilt, sobald die Si-Dotierungskonzentration für n-Al0,40 Ga0.60 N-Schicht des PNP-AlGaN-Übergangs nimmt zu.
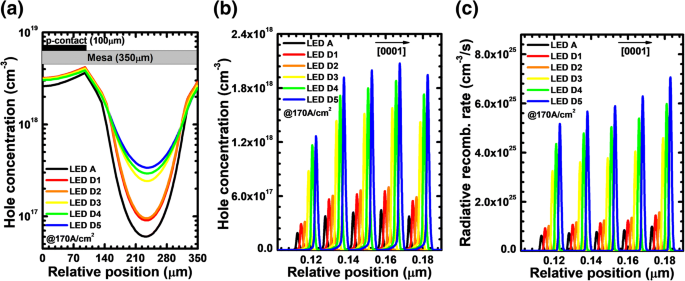
a Laterale Lochverteilung im letzten Quantentopf, b Lochkonzentrationsprofile und c Strahlungsrekombinationsratenprofile in der MQW-Region oder LEDs A, D1, D2, D3, D4 und D5 bei einer Stromdichte von 170 A/cm 2 . Die gezeichneten Kurven für die Paneele b und c werden absichtlich um 2 nm verschoben, um eine bessere Auflösung zu erzielen
Anschließend zeigen wir die Lochkonzentrationsprofile und Strahlungsrekombinationsratenprofile im MQW-Bereich für alle untersuchten Geräte bei einer Stromdichte von 170 A/cm 2 in Fig. 9b bzw. c, die an einer Position von 230 μm von der linken Mesakante entfernt gesammelt werden. Es wird deutlich gezeigt, dass LED A die niedrigste Lochkonzentration und die schlechteste Strahlungsrekombinationsrate im MQW-Bereich aufweist. Die Lochkonzentration und die Strahlungsrekombinationsrate in der MQW-Region steigen mit steigenden Dotierungskonzentrationen von n-Al0.40 Ga0.60 N-Schichten für die LEDs mit PNP-AlGaN-Übergängen. Die erhöhte Lochkonzentration im MQW für die LEDs D1, D2, D2, D3, D4 und D5 wird dank des PNP-AlGaN-Übergangs auf den besseren Stromverteilungseffekt zurückgeführt.
Anschließend berechnen und präsentieren wir die EQE und die optische Leistungsdichte in Bezug auf die Injektionsstromdichte für die untersuchten Geräte in Abb. 10a. Die beobachtete EQE stimmt mit den Ergebnissen in Fig. 9b, c überein, sodass die EQE verbessert werden kann, sobald der PNP-AlGaN-Übergang verwendet wird. Darüber hinaus, da die Si-Dotierungskonzentration in n-Al0,40 Ga0.60 N-Schicht für den PNP-AlGaN-Übergang erhöht, kann die EQE dank der besseren Stromverteilung weiter gefördert werden. Abbildung 10b vergleicht die Durchlassspannung der untersuchten Geräte. Es wird gezeigt, dass die Durchlassbetriebsspannung mit zunehmender Dotierungskonzentration im n-Al0,40 . ansteigt Ga0.60 N-Schicht. Beachten Sie, dass die Si-Dotierungskonzentrationen 1,33 × 10 18 . betragen und 1,73 × 10 18 cm −3 , zeigt die Einschaltspannung einen signifikanten Anstieg, was darauf hindeutet, dass sich der eingebaute PNP-AlGaN-Übergang wie eine parasitäre Diode verhält, wenn die Si-Dotierung in n-Al0,40 Ga0.60 N-Schicht nimmt auf ein sehr hohes Niveau zu. Um die Leistung der DUV-LEDs mit unterschiedlichen PNP-AlGaN-Übergängen genauer beurteilen zu können, zeigt Abb. 11 WPE als Funktion der Injektionsstromdichte für LED A, D1, D2, D3, D4 und D5. Es ist deutlich zu erkennen, dass der WPE bei LED D5 am niedrigsten ist, was auf den größten Durchlassspannungsverbrauch zurückzuführen ist. Der Einschub für Abb. 11 zeigt auch, dass das WPE empfindlicher auf die Si-Dotierungskonzentration von n-Al0,40 . reagiert Ga0.60 N-Schicht als die EQE. Es sei darauf hingewiesen, dass die hohe Si-Dotierungskonzentration des n-Al0,40 Ga0.60 Die N-Schicht kann tatsächlich die Stromausbreitungsschicht verbessern und die Photonenerzeugungsrate erhöhen. Trotzdem verbraucht der zusätzliche Durchlassspannungsabfall an den PNP-AlGaN-Übergängen mehr elektrische Leistung, wodurch die WPE begrenzt wird. Die Ergebnisse in diesem Abschnitt veranschaulichen auch, dass die Si-Dotierungskonzentration im n-Alx Ga1-x Die N-Schicht soll richtig reduziert werden, wenn man die AlN-Zusammensetzung und/oder die Dicke des n-Alx . erhöht Ga1-x N-Schicht für den PNP-AlGaN-Übergang, da dadurch sowohl der verbesserte EQE als auch der anständige WPE erreicht werden können.
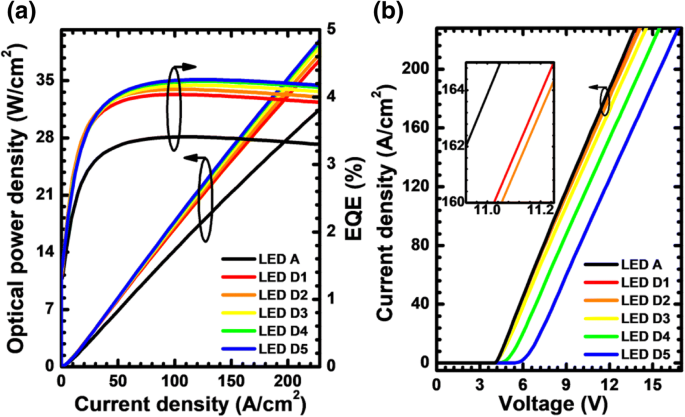
a Optische Ausgangsleistungsdichte und EQE als Funktion des Injektionsstroms, b Strom-Spannungs-Kennlinie für LEDs A, D1, D2, D3, D4 und D5. Die eingefügte Abbildung zeigt die vergrößerten Strom-Spannungs-Kurven
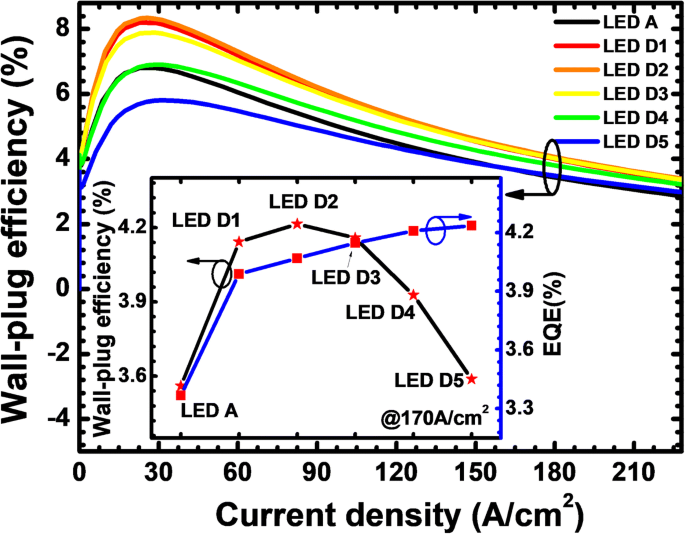
WPE als Funktion des Injektionsstroms für LEDs A, D1, D2, D3, D4 und D5. Eingefügte Abbildung zeigt WPE und EQE für die untersuchten LEDs mit verschiedenen Dotierungskonzentrationen des n-Al0,40 Ga0.60 N-Schicht mit einer Stromdichte von 170 A/cm 2
Auswirkungen der PNP-AlGaN-Verbindungsnummer auf die Geräteleistung
In diesem Abschnitt wird der Einfluss der Anzahl der PNP-AlGaN-Übergänge auf die elektrische und optische Leistung von DUV-LEDs untersucht. Zu Demonstrationszwecken legen wir die Dotierungskonzentration und die Dicke der n-AlGaN-Schicht auf 5,3 × 10 17 . fest cm −3 bzw. 20 nm. Die AlN-Zusammensetzung wird zu 0,40 ausgewählt, beispielsweise n-Al0,40 Ga0.60 N. Wir verwenden verschiedene Schleifen für den PNP-AlGaN-Übergang, d. h. die Schleifennummern werden für die LEDs N1, N2, N3 bzw. N4 auf 1, 2, 3 und 4 gesetzt. Wir berechnen und präsentieren zunächst die Valenzband-Barrierehöhe für jeden PNP-AlGaN-Übergang in Tabelle 3. Es ist offensichtlich, dass die Zunahme der PNP-AlGaN-Übergangszahl den Gesamtwert N·ρ PNP hoch. Anschließend berechnen und demonstrieren wir die Querverteilung für die Löcher im letzten Quantentopf für die LEDs A, N1, N2, N3 und N4 bei der Stromdichte von 170 A/cm 2 (siehe Abb. 12a). Es zeigt sich, dass die Lochverteilung im letzten Quantentopf gleichmäßiger wird, wenn mehr PNP-AlGaN-Übergänge eingebaut werden. Die Ergebnisse in Abb. 12a unterstützen die Vorhersagen von Gl. (1).
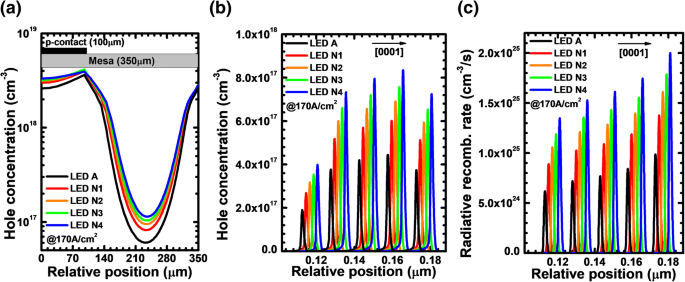
a Laterale Lochverteilung im letzten Quantentopf, b Lochkonzentrationsprofile und c Strahlungsrekombinationsratenprofile in der MQW-Region für die LEDs A, N1, N2, N3 und N4 bei einer Stromdichte von 170 A/cm 2 . Die gezeichneten Kurven für die Paneele b und c werden absichtlich um 2 nm verschoben, um eine bessere Auflösung zu erzielen
Then, we show the hole concentration and radiative recombination rate profiles in the MQW region for LEDs A, N1, N2, N3, and N4 at the current density of 170 A/cm 2 in Fig. 12b, c, respectively. The hole and radiative recombination rate profiles are probed at the position of 230 μm apart from the left mesa edge. It is indicated that the hole concentration and radiative recombination rate increase if the number of the PNP-AlGaN junction is more. It is worth mentioning here that we do not increase the value of N beyond 4, since when the N is further increased, the thickness of the remaining p-Al0.40 Ga0.60 N layer becomes so thin that the holes may be depleted by the ionized Si dopants and the hole supply can be insufficient.
Thanks to the improved current spreading effect, the enhanced hole concentration in the MQW region, LEDs N1, N2, N3, and N4 consequently promote the EQE and optical power density when compared with LED A (see Fig. 13a). Figure 13b demonstrates that the forward operating voltage for the suggested DUV LEDs also increases if more PNP-AlGaN junctions are incorporated. Fortunately, the increase of the forward voltage for LEDs N1, N2, N3, and N4 does not reduce the WPE according to Fig. 14. Further investigations into the inset of Fig. 14 can illustrate that both the EQE and WPE tend to approach a saturation level as the number of the PNP-AlGaN junction increases. Therefore, we believe that, as has also been pointed out previously, further increase of the number for the PNP-AlGaN junction may deplete the holes and correspondingly degrade the hole supply capability, hence making little contribution in enhancing the EQE and the WPE for the proposed device architectures in this work.
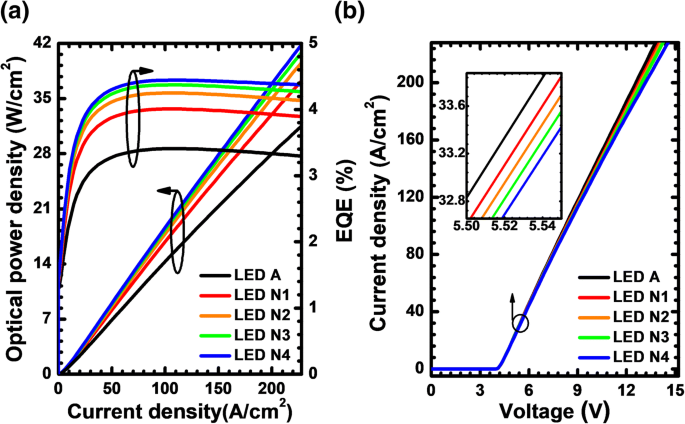
a Optical output power density and EQE as a function of the injection current, b current-voltage characteristic for LEDs A, N1, N2, N3, and N4. Inset figure shows the zoom-in current-voltage curves
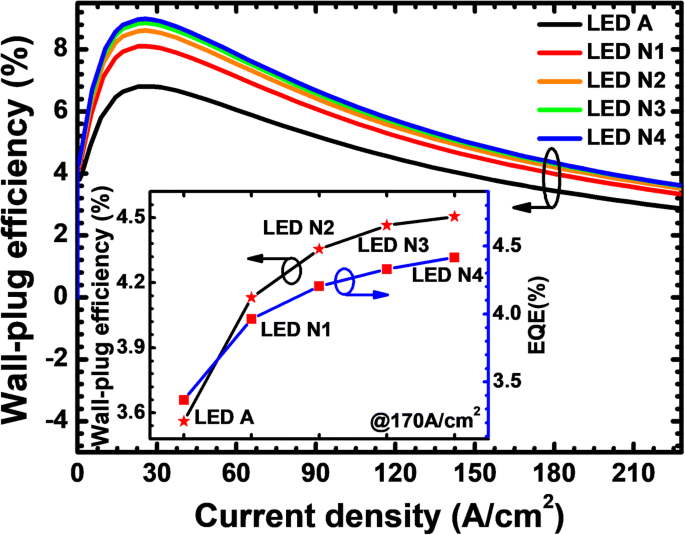
WPE as a function of the injection current for LEDs A, N1, N2, N3, and N4. Inset figure shows the WPE and EQE for LEDs with various number of PNP-AlGaN junction at the current density of 170 A/cm 2
Impact of the AlN Composition for n-AlGaN Layer on the Device Performance
Lastly, we modify the ρ PNP by varying the AlN composition of the n-AlGaN layer for the PNP-AlGaN junction. The values for the AlN composition of the n-AlGaN layer are set to 0.40, 0.43, 0.46, 0.49, and 0.51 for LEDs C1, C2, C3, C4, and C5, respectively. The thickness and the Si doping concentration of the n-AlGaN layer are set to 20 nm and 5.3 × 10 17 cm −3 , bzw. We adopt two PNP-AlGaN junctions for LEDs C1, C2, C3, C4, and C5. The AlN composition for the rest p-AlGaN layers is fixed to 0.40. Table 4 demonstrates the valence band barrier height for the PNP-AlGaN junction with different AlN compositions in the n-AlGaN insertion layer. It is easily understandable that the increased AlN composition in the n-AlGaN layer gives rise to the larger valence band barrier height for holes. Figure 15a exhibits the lateral distributions for holes in the last quantum well for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The current spreading effect is significantly improved as the AlN composition of the n-AlGaN layer increased up to 0.43. It seems that the holes cannot be further soundly spreaded when the AlN composition of the n-AlGaN layer exceeds 0.43 for our structures, because a too much high AlN composition in the n-AlGaN may block the hole injection.

a Lateral hole distribution in the last quantum well, b hole concentration profiles, and c radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The plotted curves for panels b und c are purposely shifted by 2 nm for better resolution
The hole concentration and radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 are presented in Fig. 15b, c, respectively. The data are also collected at the position of 230 μm apart from the left mesa edge. The conclusions here are similar to that for Fig. 6b, Fig. 9b and Fig. 12b, i.e., the adoption of the PNP-AlGaN current spreading layer increases the hole injection, and the hole concentration in the MQW region becomes even more improved once the AlN composition in the n-AlGaN layer increases. We then further calculate and present the EQE and the optical power density in terms of the injection current for the investigated devices in Fig. 16a. Clearly, we can see that the EQE can be improved once the PNP-AlGaN junction is employed. In addition, as the AlN composition in the n-AlGaN layer for the PNP-AlGaN junction increases, the EQE can be further promoted, thanks to the better current spreading, which homogenizes the hole concentration in each quantum well plane as has been shown previously.
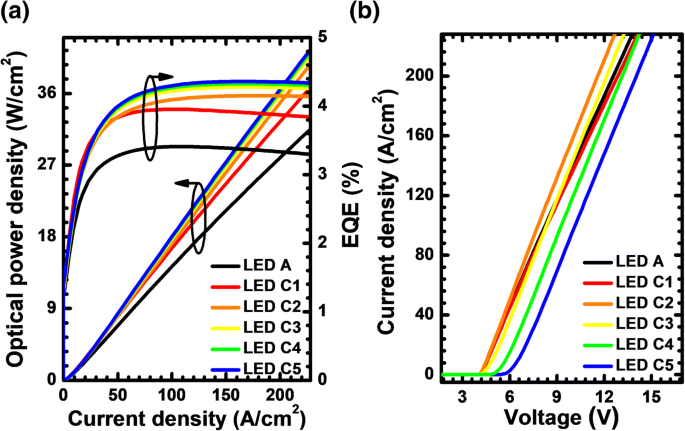
a Optical output power density and EQE as a function of the injection current and b current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5
Figure 16b investigates the current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5. The device exhibits a slight increase in the forward operating voltage for LED C1 with the PNP-Al0.40 Ga0.60 N junction when compared to the LED A. Meanwhile, the device consumes more forward voltage for LEDs C4 and C5. The observation here is consistent with that in Fig. 7b, Fig. 10b and Fig. 13b, such that the adoption of the PNP-AlGaN junction causes the additional valence band barrier height for holes, which, as a result, increases the forward voltage and even the turn-on voltage (e.g., LEDs C4 and C5). However, it is worth mentioning that the forward operating voltage for LEDs C2 and C3 decreases when compared to LED A. The underlying mechanism is not clear at this moment. However, we tentatively attribute the reduced forward voltage for LEDs C2 and C3 to the hole acceleration effect [35].
Figure 17 shows the relationship between the WPE and the injection current density for the tested LEDs. We can get that the WPE can be enhanced for all the proposed LEDs especially when the injection current density is beyond 89 A/cm 2 . Insightful study into LED C5 shows that the WPE for LED C5 is lower than that for LED A when the current density is smaller than 89 A/cm 2 . Nevertheless, the WPE for LED C5 overwhelms that for LED A when the injection current density become higher (i.e.,> 89 A/cm 2 ). As is well known, the current easily gets crowded when the LED device is biased at a high current level. The WPE for LED C5 reflects that the PNP-Al0.51 Ga0.49 N junction is indeed effective in improving the current spreading effect. However, considering the additional voltage consumption in the PNP-AlGaN junction, one shall be very careful when setting the AlN composition for the n-AlGaN layer so that the WPE can be maximized according to the inset in Fig. 17.
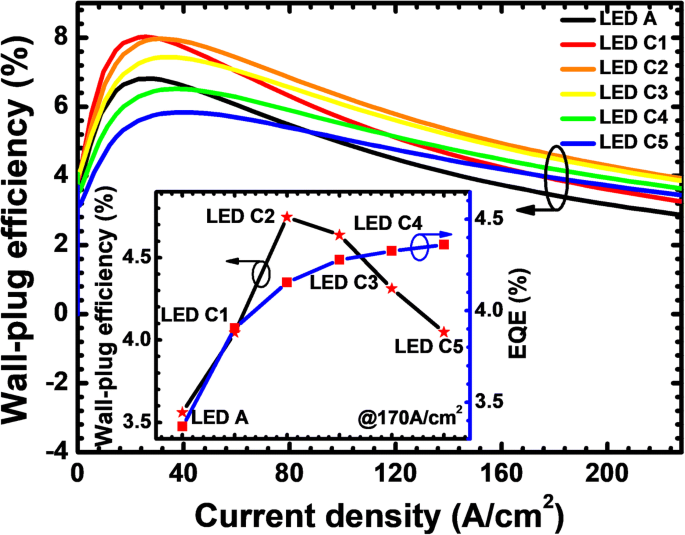
WPE as a function of the injection current for LEDs A, C1, C2, C3, C4, and C5. Inset figure shows the WPE and the EQE for the studied LEDs with various AlN compositions for the n-AlGaN layer at the current density of 170 A/cm 2
Schlussfolgerungen
To summarize, the PNP-AlGaN junction for DUV LEDs are explored and demonstrated. Assisted by the proposed PNP-AlGaN junctions, the current spreading effect can be improved. The improved current spreading effect is well attributed to increased the vertical resistance and the enhanced horizontal current flow. Moreover, we have also conducted the parametric study to reveal different PNP-junctions on the current spreading effect, the EQE and the WPE. We find that by properly increasing the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction, the current spreading effect can be improved. On the other hand, we also find that the current spreading effect can indeed enhance the EQE. However, the forward voltage may be increased if the PNP-AlGaN junction is not fully optimized, the cost of which is the reduced WPE. It is also worthy pointing out that the current spreading feature is the cooperative function of the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction. As a result, there is no unique answer for the best design of the PNP-AlGaN current spreading layer for DUV LEDs. However, we strongly believe that the findings in this work introduce the additional physical understanding to the PNP-AlGaN current spreading layer and the current spreading effect for DUV LEDs. Hence, this work is very useful for the community of optical semiconductor devices.
Abkürzungen
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- CBL:
-
Current blocking layer
- CL:
-
Current spreading layer
- DUV LEDs:
-
Deep ultraviolet light-emitting diodes
- EQE:
-
Externe Quanteneffizienz
- IQE:
-
Interne Quanteneffizienz
- LQW:
-
Last quantum well
- MOCVD:
-
Metall-organische chemische Gasphasenabscheidung
- MQWs:
-
Multiple quantum wells
- PNP-AlGaN:
-
p-AlGaN/n-AlGaN/p-AlGaN
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Effizienz der Steckdosenleiste
Nanomaterialien
- Plädoyer für neuromorphe Chips für KI-Computing
- IBM-Wissenschaftler erfinden ein Thermometer für die Nanoskala
- Das Design der Emissionsschicht für Elektronenvervielfacher
- Grüne Synthese von InP/ZnS-Kern/Schale-Quantenpunkten für die Anwendung in schwermetallfreien Leuchtdioden
- Die optimale Titan-Vorstufe zur Herstellung einer kompakten TiO2-Schicht für Perowskit-Solarzellen
- Fast Effizienz-Droop-Free AlGaN-basierte UV-Licht emittierende Dioden mit einer speziell entwickelten Übergitter-Elektronenblockierschicht vom p-Typ für eine hohe Mg-Dotierungseffizienz
- Perowskit-Leuchtdioden mit hoher Leuchtdichte mit hochpolarem Alkohollösungsmittel, das PEDOT:PSS als Lochtransportschicht behandelt
- Einfluss der Quanten-Well-Breite auf die Elektrolumineszenz-Eigenschaften von AlGaN-Tiefen-Ultraviolett-Leuchtdioden bei verschiedenen Temperaturen
- Integration umweltfreundlicher Perowskite für hocheffiziente weiße Leuchtdioden
- Was sind die häufigsten Anwendungen für Wechselstrom?



