Direktes Wachstum einkristalliner GaN-Nanodrähte auf Indium-Zinn-Oxid-beschichtetem Siliziumdioxid
Zusammenfassung
In dieser Arbeit demonstrierten wir das direkte Wachstum von GaN-Nanodrähten auf einem mit Indium-Zinn-Oxid (ITO) beschichteten Quarzglassubstrat. Die Nanodrähte wurden katalysatorfrei mittels plasmaunterstützter Molekularstrahlepitaxie (PA-MBE) gezüchtet. Der Einfluss der Wachstumsbedingungen auf die Morphologie und Qualität der Nanodrähte wird systematisch untersucht. Die strukturelle Charakterisierung zeigt, dass die Nanodrähte in (0001)-Richtung direkt auf der ITO-Schicht senkrecht zur Substratebene wachsen. Die optische Charakterisierung der Nanodrähte zeigt, dass die Photolumineszenzreaktion der Nanodrähte keine gelbe Lumineszenz aufweist, was auf die geringe Anzahl von Defekten zurückzuführen ist. Die Messung mit konduktiver Rasterkraftmikroskopie (C-AFM) an n-dotierten GaN-Nanodrähten zeigt eine gute Leitfähigkeit für einzelne Nanodrähte, was das Potenzial der Nutzung dieser Plattform für neuartige Geräteanwendungen bestätigt. Durch die Verwendung eines Wachstumsprozesses bei relativ niedriger Temperatur konnten wir erfolgreich hochwertiges einkristallines GaN-Material ohne den Abbau der darunter liegenden ITO-Schicht züchten.
Einführung
Kommerziell erhältliche III-Nitrid-basierte Bauelemente sind meist auf Saphir als Wachstumssubstrat angewiesen, da sie das Wachstum von GaN mit akzeptabler Materialqualität aufnehmen können. Die Herausforderung bei der Herstellung von Saphirsubstraten mit großem Durchmesser bei gleichzeitiger Aufrechterhaltung einer akzeptablen Oberflächenqualität des Substrats bleibt jedoch ein Hindernis bei der Hochskalierung der Produktion [1, 2]. Eine praktikable Alternative zu Saphir als III-Nitrid-Wachstumssubstrat wäre die Verwendung von Substraten auf Siliciumdioxidbasis, da sie wirtschaftlich weniger teuer sind und in Industrie- und Verbraucheranwendungen weit verbreitet sind. Da jedoch Substrate auf Siliciumdioxidbasis von Natur aus nicht leitend sind, muss eine nicht transparente leitende Schicht verwendet werden, um die elektrische Leitfähigkeit zu ermöglichen [3, 4]. Daher wird ein Verfahren zum Bereitstellen von gleichzeitiger Leitfähigkeit und Transparenz auf einem Siliziumdioxidsubstrat sehr wichtig. Wir haben zuvor eine dünne Ti-Zwischenschicht als Nukleationsstelle für Nanodrähte verwendet, um gleichzeitig Transparenz und Leitfähigkeit zu gewährleisten [5]. Da jedoch eine dünne Ti-Schicht erforderlich ist, wird die elektrische Leitfähigkeit der Probe begrenzt.
Ein weiteres mögliches Verfahren für ein transparentes und leitendes Substrat ist die Verwendung von Indium-Zinn-Oxid (ITO) als GaN-Keimbildungsstelle, da es transparent und elektrisch leitfähig ist und über eine große Oberfläche abgeschieden werden kann. Die ITO-Technologie ist bereits ausgereift und wird in verschiedenen Industrien für transparente Elektroden vielfach eingesetzt. Die gegenwärtig zur Herstellung von GaN verwendete konventionelle Technik ist jedoch nicht mit ITO kompatibel. Die hohe Temperatur, die erforderlich ist, um die beim Wachstum der metallorganischen chemischen Gasphasenabscheidung (MOCVD) verwendeten Vorläufer aufzuspalten, führt zum Abbau der ITO-Schicht. Somit ist ein Niedertemperatur-GaN-Wachstumsverfahren erforderlich, das in der Lage ist, qualitativ hochwertiges Material herzustellen. Frühere Versuche, GaN auf ITO bei niedriger Temperatur unter Verwendung von Sputtern und plasmaunterstützter chemischer Gasphasenabscheidung (PECVD) zu züchten, wurden durchgeführt [6–12]. Niedrigtemperatur-Wachstumsverfahren führen jedoch typischerweise zu polykristallinem Material und einer großen Anzahl von Defekten.
In dieser Arbeit versuchen wir, dieses Problem durch das direkte Wachstum von kristallinen GaN-Nanodrähten auf ITO-beschichtetem Quarzglas mittels plasmaunterstützter Molekularstrahlepitaxie (PA-MBE) zu umgehen. In PA-MBE wird dem System aktive Stickstoffspezies zugeführt, indem die Bindung zwischen reinem N2 . gebrochen wird Gas mit HF-Leistung. Somit kann die Wachstumstemperatur im Vergleich zu anderen epitaktischen GaN-Wachstumsverfahren deutlich niedriger sein, wodurch die Degradation der ITO-Schicht verhindert wird. Durch die Verwendung von GaN-Nanodrähten ist es möglich, hochwertiges GaN auf der polykristallinen ITO-Schicht zu wachsen. Aufgrund der Spannungsrelaxation und der Filterung der Einfädelungsversetzung, die dem hohen Oberflächen-Volumen-Verhältnis der Nanodrähte zugeschrieben wird [13, 14] weisen die GaN-Nanodrähte trotz fehlender Gitteranpassung zwischen den Nanodrähten und den darunter liegenden Nanodrähten typischerweise eine Einkristallinität und keine Einfädelungsversetzung auf Nukleationsschicht [15].
Wir untersuchten die Morphologie der Nanodrähte und ihre Beziehung zur darunterliegenden ITO-Schicht, die optischen Eigenschaften der Nanodrähte und die Möglichkeit, diese Plattform für Geräteanwendungen zu verwenden. Strukturelle Charakterisierungen mittels Elektronenmikroskopie zeigen, dass die Nanodrähte direkt auf der ITO-Schicht senkrecht zur Substratebene in Richtung der c-Ebene (0001) wachsen. Die Photolumineszenzmessung ergibt einen guten Wert der internen Quanteneffizienz (IQE), während eine mit Defekten verbundene gelbe Lumineszenz im Emissionsspektrum fehlt. Schließlich bestätigt die leitfähige Rasterkraftmikroskopie (C-AFM) an n-dotierten GaN-Nanodrähten, dass die Nanodrähte leitfähig sind, was die Möglichkeit der Herstellung neuartiger Bauelemente unter Verwendung der GaN-Nanodrähte auf der ITO-Plattform unterstreicht. Aus unserer Arbeit erschlossen wir das Potenzial des Aufwachsens von III-Nitrid-Nanodrähten auf ITO für Geräteanwendungen, bei denen Substrattransparenz und Leitfähigkeit erforderlich sind.
Methoden
ITO-Dünnschichtabscheidung
Der in diesem Experiment verwendete ITO-Dünnfilm wurde unter Verwendung des RF-Magnetron-Sputterverfahrens abgeschieden. Die Abscheidung erfolgte bei Umgebungstemperatur mit Argonplasma bei 60 W HF-Leistung, 2,5 mTorr Kammerdruck und 25 Standardkubikzentimeter pro Minute (sccm) Gasflussrate. Vor der Abscheidung werden die Proben mit einer Standardlösungsmittelreinigung unter Verwendung von Aceton und Isopropylalkohol gereinigt. Ein etwa 100 nm dicker ITO-Dünnfilm wurde direkt auf blankem Siliziumdioxid abgeschieden.
III-Nitrid-Nanodraht-Wachstum
Die GaN-Nanodrahtproben werden unter Verwendung eines Veeco Gen 930 Plasma-unterstützten Molekularstrahl-Epitaxie-(PA-MBE)-Reaktors gezüchtet. Vor dem MBE-Wachstum wurde das ITO-beschichtete Siliziumdioxid-Substrat in einem Ofen zum schnellen thermischen Glühen (RTA) bei 650 °C unter Ar-Umgebung für 5 Minuten geglüht, um die Kristallinität der ITO-Schicht zu verbessern. Vor dem Laden in die Kammer werden die Proben mit einem Standard-Lösungsmittelreinigungsverfahren gereinigt. Die Proben werden anschließend in der MBE-Ladeschleuse und der Vorbereitungskammer bei 200 °C und 650 °C thermisch gereinigt, um Feuchtigkeit bzw. andere Verunreinigungen zu entfernen.
Während des Nanodrahtwachstums verwendeten wir einen Ga-Beam-Äquivalentdruck (BEP) von 1×10 –7 Torr gemäß der BFM-Ionenanzeige. Alle Substrattemperaturen werden mit dem Thermoelement gemessen. Um das Wachstum von Nanodrähten zu fördern, wurde eine anfängliche Impfschicht bei 500 °C abgeschieden. Nach der anfänglichen Abscheidung der Keimschicht wurde die Substrattemperatur für das Nanodrahtwachstum auf 700 °C erhöht.
Strukturelle, optische und elektrische Charakterisierung
Die Oberflächenmorphologie der ITO-Schicht wurde mit dem Agilent 5500 SPM Rasterkraftmikroskopiesystem (AFM) untersucht. Die elektrischen Eigenschaften der Probe wurden unter Verwendung von leitfähigem AFM (C-AFM) im Kontaktmodus gemessen. Um den elektrischen Kontakt zwischen den Nanodrähten und der C-AFM-Spitze zu verbessern, wurde eine Ni/Au-Schicht mit einer Dicke von 5/5 nm auf den Nanodrähten mittels Elektronenstrahlverdampfung abgeschieden, gefolgt von einem schnellen thermischen Tempern bei 600 °C in atmosphärischer Umgebung. Die C-AFM-Messung erfolgte unter Verwendung einer Pt/Ir-beschichteten AFM-Spitze und Anlegen einer Vorspannung an die ITO-Schicht der Probe. Da in unserer C-AFM-Konfiguration eine Vorspannung an das Substrat angelegt wird, zeigt ein positiver Stromfluss an, dass ein Strom von der Probe zur AFM-Spitze fließt.
Die strukturelle Qualität der auf ITO gewachsenen GaN-Nanodrähte wurde mittels Transmissionselektronenmikroskopie (TEM) untersucht. Eine Querschnitts-TEM-Probe wurde unter Verwendung eines FEI Helios Nanolab 400s Dual Beam Focused Ion Beam (FIB) SEM hergestellt. Die REM-Bildgebung wurde unter Verwendung des FEI Nova Nano und des Zeiss Merlin REM-Systems durchgeführt. Charakterisierungen mit hochauflösender Transmissionselektronenmikroskopie (HRTEM) und hochauflösendem ringförmigen Dunkelfeld-STEM mit hohem Winkel (HAADF-STEM) wurden unter Verwendung eines Titan 80-300 ST-Transmissionselektronenmikroskops (FEI Company) durchgeführt. Die Karte der elementaren Zusammensetzung wurde durch Elektronenenergieverlustspektroskopie (EELS) erhalten.
Um die Polarität der Nanodrähte zu untersuchen, haben wir KOH-basiertes Ätzen verwendet. Es wurde berichtet, dass nasschemisches Ätzen unter Verwendung von KOH ein bevorzugtes Ätzen für N-Flächen-GaN zeigt. Daher kann die Polarität durch Vergleich der Morphologie der Nanodrähte vor und nach dem KOH-Ätzen bestimmt werden. Wir haben den GaN-Nanodraht auf ITO-Proben in einer 40%igen KOH-Lösung für 1 Stunde bei Raumtemperatur eingetaucht und die Morphologie vor und nach dem chemischen Eintauchen verglichen, um die Wachstumspolarität des Nanodrahts zu bestimmen.
Wir untersuchten die optischen Eigenschaften der direkt auf ITO gewachsenen GaN-Nanodrähte mit einem temperatur- und leistungsabhängigen Photolumineszenz(PL)-Messaufbau. Die Probe wurde in einen Helium-gekühlten Kryostaten geladen und mit einem 266-nm-Laser (Teem photonics SNU-20F-10x) angeregt. Die Temperatur wurde von 10 bis 290 K variiert. Wir untersuchten zuerst die leistungsabhängige Photolumineszenzreaktion, die bei 10 K durchgeführt wurde. Die Transmissionsmessung wurde mit einem UV-Vis-NIR-Spektrophotometer (Shimadzu UV-3600) durchgeführt.
Die Röntgenbeugungsmessung (XRD) wurde unter Verwendung eines Bruker D2 Phaser Pulver-XRD-Systems durchgeführt.
Ergebnisse und Diskussion
Da das Hochtemperaturwachstum von GaN-Nanodrähten zu einer Degradation der darunter liegenden ITO-Schicht führen könnte, untersuchten wir zunächst den Effekt des thermischen Temperns auf blankes ITO, das auf dem Siliziumdioxidsubstrat abgeschieden wurde. Das Experiment wurde in der Pufferkammer des MBE unter typischerweise 10 −8 . durchgeführt Torr-Druck, um die tatsächlichen Wachstumsbedingungen zu simulieren. Nach dem Glühen wird die elektrische Leitfähigkeit des blanken ITO mit einer Vierpunkt-Sondenmessung gemessen und die Oberflächenrauheit wird mit Rasterkraftmikroskopie (AFM) untersucht. Aus dem in Abb. 1a gezeigten Glühversuch ergibt sich, dass der Wert des Schichtwiderstands des ITO-Dünnfilms unter 10 \(\Omega/\square\) bleibt. Bei einer höheren Glühtemperatur wird der ITO-Dünnfilm jedoch mit größerer Korngröße rauer, wie in Abb. 1b–d gezeigt.

Einfluss der Glühtemperatur auf die elektrischen und physikalischen Eigenschaften des abgeschiedenen ITO-Dünnfilms. a Schichtwiderstand gemessen mit einer Vierpunktsonde nach dem Glühen bei verschiedenen Temperaturen. AFM-Oberflächentopographie des ITO-Dünnfilms, aufgenommen nach dem Tempern der Probe bei b 500 °C, c 600 °C und d 700 °C
Der Nanodraht-Wachstumsprozess ist in Abb. 2
. dargestellt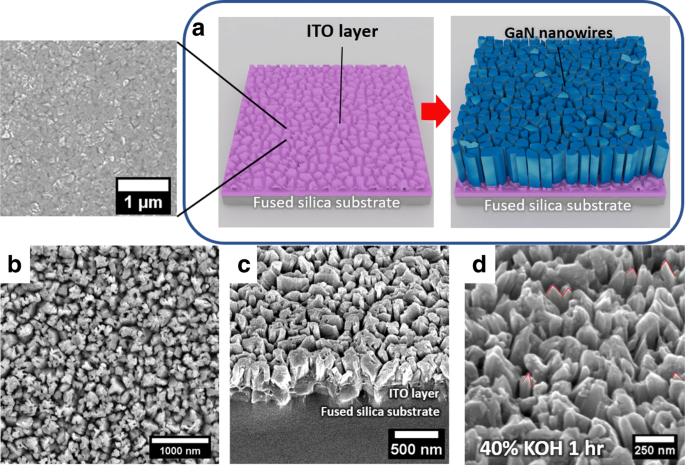
a Schematische Darstellung des Wachstums von GaN-Nanodrähten auf einer rauen ITO-Oberfläche. Der Einschub zeigt eine REM-Draufsicht der rauen ITO-Oberfläche nach dem thermischen Glühen. b Draufsicht auf auf ITO gewachsene GaN-Nanodrähte. c Höhenansicht von auf ITO gewachsenen GaN-Nanodrähten. d Höhenansicht von GaN-Nanodrähten nach 1 h KOH-Ätzen, Freilegen der geätzten GaN-Nanodrahtspitze
A. Wie das AFM-Ergebnis zeigt, führt das Tempern der ITO-Schicht bei erhöhter Temperatur zu einer rauen ITO-Oberfläche mit großer Korngröße. Während des MBE-Wachstums neigen benachbarte GaN-Nanodrähte, die auf der Oberfläche eines einzelnen Korns wachsen, dazu, zusammenzuwachsen und einen größeren Nanodraht zu bilden, der aus einem Cluster von Nanodrähten besteht. Daher beeinflusst die Morphologie des darunterliegenden ITO direkt die Morphologie der darauf aufgewachsenen Nanodrähte. Die Draufsicht der Rasterelektronenmikroskopaufnahme (REM) ist in Abb. 2b gezeigt. Aus der Draufsicht wird die Nanodrahtdichte statistisch auf 9,3 × 10 9 . geschätzt cm −2 mit einem Füllfaktor von 73 %. Die Querschnittsansicht der Probe ist in Abb. 2c gezeigt. Die Nanodrähte wachsen senkrecht zur Substratebene mit einer gewissen Neigung direkt auf der ITO-Schicht.
Das REM-Bild der Nanodrahtprobe nach 1 h Eintauchen in eine 40%ige KOH-Lösung ist in Abb. 2d gezeigt. Es ist zu erkennen, dass nach der chemischen Behandlung die Spitzen der Nanodrähte teilweise abgeätzt sind, was auf N-Polarität hinweist. Dieses Ergebnis stimmt mit früher berichteten Ergebnissen überein, bei denen spontan gewachsene III-Nitrid-Nanodrähte typischerweise N-polar sind [16–19].
Abbildung 3a zeigt die ringförmige Dunkelfeld-Rastertransmissionselektronenmikroskopie (HAADF-STEM) mit großem Winkel der Nanodrähte. Die Nanodrähte wachsen direkt auf die ITO-Schicht. Um die elementare Zusammensetzung der Grenzfläche zwischen den Nanodrähten und der ITO-Schicht zu untersuchen, haben wir einen elementaren Mapping-Linienscan für Ga, In, N und O unter Verwendung von EELS im Bereich innerhalb eines roten Kastens durchgeführt. Das Zeilenscan-Profil ist in Abb. 3b dargestellt. Das Linienprofil zeigt eine klare Grenze zwischen den GaN-Nanodrähten und ITO. Ein hochauflösendes TEM-Bild eines einzelnen Nanodrahts in Abb. 3c zeigt die Gitteranordnung des Nanodrahts, was die Einkristallinität des Materials bestätigt. Hochauflösendes TEM an der Grenzfläche zwischen GaN-Nanodrähten und ITO-Schicht in Abb. 3d zeigt eine scheinbar Zwischenschicht (IL) bestehend aus einer Mischung aus polykristalliner und amorpher Schicht mit einer Dicke von etwa 4 nm zwischen der Basis des Nanodrahts und dem ITO . Es wird vorgeschlagen, dass diese dünne Schicht eine Übergangs-GaN-Schicht ist, die zwischen der polykristallinen ITO-Schicht und der kristallinen GaN-Schicht gebildet wird. Über eine ähnliche Schicht wurde bereits berichtet, bei der GaN-Nanodrähte direkt auf einer amorphen Quarzglasschicht aufgewachsen werden [15].

TEM und Elementarkartierung von GaN-Nanodrähten, die auf einer ITO-Schicht gewachsen sind. a HAADF-Bild von GaN-Nanodrähten, die direkt auf der ITO-Schicht aufgewachsen sind. Das rote Kästchen zeigt an, wo der EELS-Zeilenscan durchgeführt wurde. b EELS-Linienscan-Profil der Grenzfläche zwischen der Basis des GaN-Nanodrahts und der ITO-Schicht. Die Elementabbildungen für Ga, In, N und O sind in der Grafik dargestellt. c Hochauflösendes TEM des GaN-Nanodrahts mit Einkristallinität. Der rote Pfeil zeigt die Wachstumsrichtung an. Der Abstand zwischen den Ebenen entspricht der GaN-c-Ebene. d Hochauflösendes TEM-Bild der Grenzfläche zwischen dem GaN-Nanodraht und der ITO-Schicht. Zwischen den GaN-Nanodrähten und der ITO-Schicht ist eine teilweise amorphe Zwischenschicht (IL) zu sehen, die durch die gestrichelten roten Linien begrenzt wird
Das temperaturabhängige Photolumineszenzergebnis ist in Abb. 4a dargestellt. Die Messung zeigt, dass die gelbe Lumineszenz, die üblicherweise mit Defekten in GaN-Materialien verbunden ist, etwa drei Größenordnungen niedriger ist als die GaN-Bandkantenemission, was das Wachstum des hochwertigen GaN-Materials unterstreicht. Die temperaturabhängige Photolumineszenz ist in Abb. 4b dargestellt. Das Ergebnis zeigt eine Rotverschiebung mit steigender Temperatur, die üblicherweise mit der Schrumpfung der Varshni-Bandlücke verbunden ist. Die Intensität der Peakemission nimmt mit der Temperaturerhöhung aufgrund der Aktivierung der nicht strahlenden Rekombinationszentren ab. Die Arrhenius-Anpassung erfolgt anhand der Änderung der integrierten PL-Intensität über der Temperatur, wie in Abb. 4c gezeigt. Die Armatur liefert eine Aktivierungsenergie von 195 meV. Unter Verwendung des Verhältnisses der integrierten Intensität bei 290 K und 10 K schätzen wir die interne Quanteneffizienz der Nanodrähte auf etwa 67 %.

a Leistungsabhängige Messung von auf Indium-Zinn-Oxid gewachsenen GaN-Nanodrähten bei 10 K. b Temperaturabhängiger PL von auf ITO-Schicht aufgewachsenen GaN-Nanodrähten. c Berechnete Aktivierungsenergie basierend auf temperaturabhängiger PL-Messung. d Transparenz des Quarzglassubstrats, der getemperten ITO-Schicht auf Quarzglas und auf der ITO-Schicht aufgewachsenen GaN-Nanodrähten; e Die XRD-Profile für blankes Quarzglas, ITO-Dünnfilm im abgeschiedenen Zustand, getemperten ITO-Dünnfilm und auf ITO gewachsene GaN-Nanodrähte
Abbildung 4d zeigt die Änderung der Transmission für den getemperten ITO-, Quarzglas- und GaN-Nanodraht auf ITO/Silica. Die Transmission der Probe wird nach dem Wachstum des GaN-Nanodrahts reduziert. Da die GaN-Nanodrähte im sichtbaren Wellenlängenbereich nicht absorbieren, kann die verringerte Transmission auf Lichtstreuung durch die Nanodrähte selbst zurückgeführt werden.
Abbildung 4e zeigt die XRD-Ergebnisse des blanken Siliziumdioxidsubstrats, des Siliziumdioxidsubstrats mit ITO im abgeschiedenen Zustand, des RTP-getemperten ITO/Siliziumdioxids und der auf ITO/Siliziumdioxid gewachsenen GaN-Nanodrähte. In der abgeschiedenen ITO-Schicht kann kein XRD-Peak beobachtet werden, was auf eine fast amorphe Schicht hinweist. Nach dem RTP-Tempern können ITO(211), ITO(222), ITO(400), ITO(440) und ITO (622) Peaks beobachtet werden, was darauf hinweist, dass das Tempern die Kristallinität der ITO-Schicht verbessert, was mit früheren Berichten übereinstimmt [20]. Die dominantesten Peaks sind der ITO(222)-Peak und der ITO(400)-Peak. Der gemessene GaN(0002)-Peak im 2 θ Scan zeigt an, dass diese Ebene parallel zu den ITO-Ebenen ist, was zeigt, dass die GaN-Nanodrähte auf der polykristallinen ITO-Schicht wachsen.
Um zu testen, ob die GaN-Nanodrähte auf der ITO-Plattform für Geräteanwendungen geeignet sind, haben wir GaN-Nanodrähte mit n-dotierten GaN-Nanodrähten unter Verwendung von Silizium als Dotierstoff gezüchtet und die I-V-Charakteristik einzelner Nanodrähte mit C-AFM gemessen. Durch diese Methode erhielten wir die statistischen I-V-Daten aus der Probe. Die resultierende Messung ist in Abb. 5 dargestellt.

a C-AFM-Mapping der Nanodraht-Topologie. b Entsprechender Spitzenstrom mit einer Vorspannung von -8 V an die Probe angelegt. c I-V-Kurve eines einzelnen Nanodrahts mit einer Probenspannung von -10 V bis 10 V, die eine unterschiedliche I-V-Charakteristik zwischen dem ersten und zweiten Sweep zeigt. d Verteilung der I-V-Kurve einer Reihe von Nanodrähten nach dem anfänglichen Punch-Through-Sweep
Die Stromabbildung in Fig. 5b zeigt, dass die Nanodrähte in Fig. 5a anfänglich nichtleitend sind und nur einige Punkte einen Stromfluss zeigen. Um besser zu untersuchen, warum die Nanodrähte nicht leitend sind, haben wir eine I-V-Charakterisierung an einzelnen Nanodrähten durchgeführt. Der Bereich des Abtastspannungs-Sweeps reicht von – 10 bis 10 V, wobei der resultierende Spitzenstrom von – 10 bis 10 nA reicht, der durch die AFM-Systemspezifikation begrenzt ist. Das Ergebnis ist in Abb. 5c dargestellt. Beim ersten Durchlauf stellen wir fest, dass die Nanodrähte eine sehr hohe Einschaltspannung aufweisen, was auf ein Schottky-Kontaktverhalten zwischen der n-GaN- und der ITO-Schicht hinweist. Nach Wiederholung der Messung stellen wir jedoch fest, dass die Einschaltspannung der I-V-Kurve deutlich reduziert wurde, was auf die Verringerung der Schottky-Barrierehöhe zurückzuführen ist. Wir beobachteten diesen Trend einer verringerten Einschaltspannung nach dem anfänglichen Durchgriffsspannungsdurchlauf über mehrere Nanodrähte im AFM-Scanbereich, der in Abb. 5d gezeigt ist, und bestätigten, dass dies für alle auf ITO gewachsenen Nanodrähte zutrifft. Der genaue Mechanismus der Absenkung der Einschaltspannung bedarf noch weiterer Untersuchungen. Frühere Berichte haben gezeigt, dass das Anlegen einer Hochspannung an das Material möglicherweise stromführende Pfade durch elektrischen Durchbruch induziert hat [21, 22] oder die Struktur des GaN-Nanodrahts selbst modifiziert [23], was zu einer Verbesserung der Einschaltspannung führt.
Schlussfolgerungen
Zusammenfassend haben wir das Wachstum von GaN-Nanodrähten auf einem auf einem Quarzglassubstrat abgeschiedenen ITO-Dünnfilm durchgeführt. Die physikalische Charakterisierung mittels Elektronenmikroskopie zeigt, dass die Nanodrähte senkrecht zur Substratebene wachsen und dabei eine hohe Kristallqualität beibehalten. Durch Photolumineszenz-Charakterisierung wurde eine starke GaN-Bandkantenemission nachgewiesen, während die üblicherweise mit Defekten verbundene gelbe Lumineszenz fehlt. Die Nanodrähte haben eine bevorzugte N-Polarität, angezeigt durch das bevorzugte Ätzen der Kristallebene in einer KOH-Lösung. C-AFM-Messungen an n-dotierten Nanodrähten zeigen eine gute Leitfähigkeit, was die Möglichkeit der Plattform für die Geräteanwendung unterstreicht.
Abkürzungen
- AFM:
-
Rasterkraftmikroskopie
- BEP:
-
Strahläquivalentdruck
- C-AFM:
-
Konduktive Rasterkraftmikroskopie
- EELS:
-
Elektronenenergieverlustspektroskopie
- FIB:
-
Fokussierter Ionenstrahl
- IQE:
-
Interne Quanteneffizienz
- HAADF:
-
Ringförmiges Dunkelfeld mit großem Winkel
- HRTEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- ITO:
-
Indium-Zinn-Oxid
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- PA-MBE:
-
Plasma-unterstützte Molekularstrahlepitaxie
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- PL:
-
Photolumineszenz
- RF:
-
Funkfrequenz
- RTA:
-
Schnelles thermisches Glühen
- sccm:
-
Standardkubikzentimeter pro Minute
- SEM:
-
Rasterelektronenmikroskopie
- MINT:
-
Rastertransmissionselektronenmikroskopie
- TEM:
-
Transmissionselektronenmikroskopie
- XRD:
-
Röntgenbeugung
Nanomaterialien
- Materialwissenschaftler bringen Nanodrähten das Tanzen bei
- Erkennen des Magnetismus des Kerns eines einzelnen Atoms
- Zinn-Nanokristalle für zukünftige Batterien
- Über halbleitende Nanopartikel
- Selbstkatalysiertes Wachstum von vertikalen GaSb-Nanodrähten auf InAs-Stämmen durch metallorganische chemische Gasphasenabscheidung
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Auf dem Weg zu Einzelatomketten mit abgeblättertem Tellur
- Direktes Wachstum von federartigen ZnO-Strukturen durch eine einfache Lösungstechnik für die Fotoerkennungsanwendung
- Kontrollieren des Wachstums von Indiumselenid (In2Se3)-Nanodrähten mit hoher Gleichmäßigkeit durch den schnellen thermischen Glühprozess bei niedrigen Temperaturen
- Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs



