Hochleistungs-U-Kanal-FETs mit rechteckigem Gate und nur 2 nm Abstand zwischen Source- und Drain-Kontakten
Zusammenfassung
In diesem Beitrag wird ein neuartiger Hochleistungs-U-Kanal-FET mit rechteckigem Gate (RGUC-FET) für einen extrem integrierten Abstand zwischen Source- und Drain-Kontakten vorgeschlagen. Der RGUC-FET stellt nahezu ideale Subthreshold-Eigenschaften dar, bis der Abstand zwischen Source/Drain-(S/D)-Kontakten auf 2 nm reduziert wird. Anders als bei den anderen vertieften oder U-förmigen kanalbasierten FETs müssen die Gatekontakte nicht im vertieften Bereich ausgebildet werden, sondern nur in einer Abstandsschicht zur Isolierung zwischen den beiden vertikalen Teilen auf beiden Seiten des U-Kanals. Seine strukturellen Vorteile machen es möglich, integrierte Schaltungen mit höherer Integration für extremen integrierten Abstand zwischen Source- und Drain-Kontakten herzustellen. Die elektrischen Eigenschaften des RGUC-FET wurden sorgfältig untersucht, indem der Einfluss von Designparametern untersucht wurde, einschließlich des horizontalen Abstands zwischen S/D-Kontakten, der Ausdehnungshöhe des S/D-Bereichs und der Dicke und des Materials der Gate-Oxidschicht. Die elektrischen Eigenschaften des RGUC-FET werden durch Quantensimulation verifiziert. Im Vergleich zu den anderen Nicht-Planner-Kanal-Multi-Gate-FETs eignet sich der neuartige RGUC-FET für eine höhere Integration.
Einführung
Als eines der vielversprechendsten Bauelemente, das in integrierten Nanoschaltungen (IC) verwendet wird, weist der übergangslose Feldeffekttransistor (JL-FET) bemerkenswerte elektrische Eigenschaften im Vergleich zu herkömmlichen übergangsbasierten Metalloxid-Halbleiter-(MOS)-FETs auf seine Einfachheit der Herstellung wurde in den letzten Jahren eingehend untersucht [1,2,3,4]. Während eine Erhöhung der Gatespannung den Akkumulationsbereich im Kanal bildet, was zu einem höheren Einschaltstrom führt [5], verstärkte die Einführung des Multiple-Gate (MG) FET die Steuerbarkeit des Source-Drain-Stroms von der Gatespannung, was zu zu viel besseren unterschwelligen Eigenschaften des Gerätes. Auch die Junctionless Multiple-Gate (JL MG) FETs werden seit Jahren umfassend untersucht [6,7,8]. Obwohl der Gate-Rundum-MOSFET mit vertikalem Kanal ein nahezu ideales I -V Leistung mit einem Radius von nur einigen Nanometern, der vertikale Kanal davon macht, dass der Source- und Drain-Kontakt nicht in derselben Schicht hergestellt werden konnten, was das Layout von ICs mit der Planner-Technologie inkompatibel macht. Da die Halbleiterfertigung außerdem gezwungen war, die Kanallänge auf weniger als 10 nm zu verkleinern, sind die MG-FETs erneut dem Kurzkanaleffekt ausgesetzt [9,10,11]. Um den Kurzkanaleffekt zu überwinden, sind MOSFETs mit versenkten Kanälen in den letzten Jahren ein heißes Thema geworden [12,13,14,15,16]. Auch die Modellierungs- und Simulationsarbeit von MOSFETs mit vertieftem Kanal wird umfassend durchgeführt [17,18,19,20]. Ein MOSFET mit versenktem Kanal weist sowohl planere vertikale Kanalteile unter sowohl Source- als auch Drain-Kontakten und einen horizontalen planaren Kanalteil auf. Es verlängerte tatsächlich die effektive Kanallänge im Vergleich zu herkömmlichen MOSFETs mit nur dem horizontalen planaren Kanal. Für das Bauelement mit dem gleichen Abstand zwischen Source- und Drain-Kontakten kann es im Vergleich zu herkömmlichen MOSFETs mit planarem Kanal immun gegen den Kurzkanaleffekt sein; die experimentellen Daten zeigen jedoch, dass der Unterschwellenhub von MOSFETs mit Aussparungskanal keinen idealen Unterschwellenhub mit einer effektiven Kanallänge von unter 100 nm realisieren kann. Dies liegt daran, dass, obwohl die Kanallänge verlängert wird, die Steuerbarkeit des Gates als MG-FETs nicht verstärkt wird. Es sollte beachtet werden, dass es besser ist, anstelle der Kanallänge einen neuen geometrischen Schlüsselparameter bezüglich der Beschreibung der Integration zu definieren. Der Abstand zwischen Source- und Drain-Kontakten ist realistischer und effektiver, da das Endziel des Designs des nanoskaligen Bauelements die Erzielung der besten Leistung in einer begrenzten gegebenen Chipfläche ist und die tatsächliche Bauelementgröße von der Kanalbreite abhängt und der Abstand zwischen Source- und Drain-Kontakten. Um die Vorteile sowohl der MG-FETs als auch der MOSFETs mit vertieftem Kanal zu kombinieren, haben wir in unserer vorherigen Arbeit sattelförmige Gate-FETs mit einem U-förmigen Kanal vorgeschlagen [21,22,23], was die Steuerbarkeit des Gates in die Horizontale fördert Kanalteil des vertieften Kanals von einem planaren Single-Gate-Typ zu einem 3-D-Triple-Gate-Typ. Danach aktualisieren wir dieses 3-D-Triple-Gate-Feature, das nicht nur im horizontalen Kanalteil, sondern auch in beiden vertikalen Kanalteilen gebildet wird. Dieses Gerät wird als H-Gate-U-Kanal-FETs bezeichnet, und der vertiefte Kanal wird entsprechend auch zu einem 3D-U-förmigen Röhrenkanal aufgerüstet [24]. Wie oben erwähnt, ist das Endziel des Designs des nanoskaligen Bauelements die Erzielung der besten Leistung in einer begrenzten gegebenen Chipfläche durch Optimierung. Um ein optimiertes Hochleistungsbauelement zu realisieren, sollten sowohl die Gatestruktur als auch die entsprechende Kanalstruktur gut überlegt und entworfen werden. Auch der Herstellungsaufwand sollte gut berücksichtigt werden. Die oben erwähnten Vorrichtungen, wie die Vorrichtung mit vertieftem Kanal, die früher vorgeschlagenen Sattel-FETs und HGUC-FETs haben eine gemeinsame Masse, eine Sandwichstruktur aus Gateoxid/Gate/Gateoxid sollte in dem kleinen vertieften Bereich gut ausgebildet sein. Dieses strukturelle Merkmal schränkt die weitere Integrationsförderung ein. Es scheint, dass ein guter Weg zur Förderung der Integration darin besteht, das strukturelle Merkmal im vertieften Bereich zu vereinfachen und gleichzeitig die Gate-Steuerungsfähigkeit des vertikalen Kanalteils und des horizontalen Kanalteils des U-förmigen Kanals beizubehalten. Um diese Gerätemerkmale und -funktionen zu realisieren, haben wir in diesem Artikel einen neuartigen U-Kanal-FET mit rechteckigem Gate (RGUC-FET) für einen extremen integrierten Abstand zwischen Source- und Drain-Kontakten vorgeschlagen. Es hat einen U-förmigen Kanal, der die Effektkanallänge verlängern kann, ohne den Abstand zwischen Source- und Drain-Kontakten zu vergrößern. Im Vergleich zu den anderen U-förmigen Kanal-FETs weist der RGUC-FET einen einfacheren inneren Aufbau im vertieften Bereich des U-förmigen Kanals auf; danach kann eine einfachere Herstellung im inneren Teil des vertieften Bereichs und ein geringerer Abstand zwischen Source- und Drainkontakten (höhere Integration) realisiert werden. Die vorgeschlagene Struktur hat eine bessere Gate-Steuerbarkeit und einen kleineren Sperrleckstrom, begleitet von einem höheren I EIN /Ich AUS Verhältnis. Der Abstand zwischen Sourcekontakt und Drainkontakt kann auf weniger als 2 nm verkleinert werden. Die gesamten elektrischen Eigenschaften werden durch Quantensimulationen analysiert.
Methoden
Figur 1a zeigt die schematische 3D-Ansicht des RGUC-FET, und die Figuren 1b bis d sind Profile der Vorrichtung, die durch die Ebenen A, B, C und D geschnitten sind, die in Fig. 1a gezeigt sind. W ist die Körperbreite des Siliziums, t b ist die Körperdicke des Siliziums, h in ist die Innenhöhe des Abstandshalters im vertieften Bereich, h ex ist die Höhe der Quell-/Drain-Region der Erweiterung, t Ochse ist die Dicke des Gateoxids um den Siliziumkörper herum und t sp ist die Abstandshalterdicke der im vertieften Bereich des U-förmigen Kanals abgeschiedenen Isolatorschicht, die gleich dem Abstand zwischen Source-Kontakt und Drain-Kontakt ist.
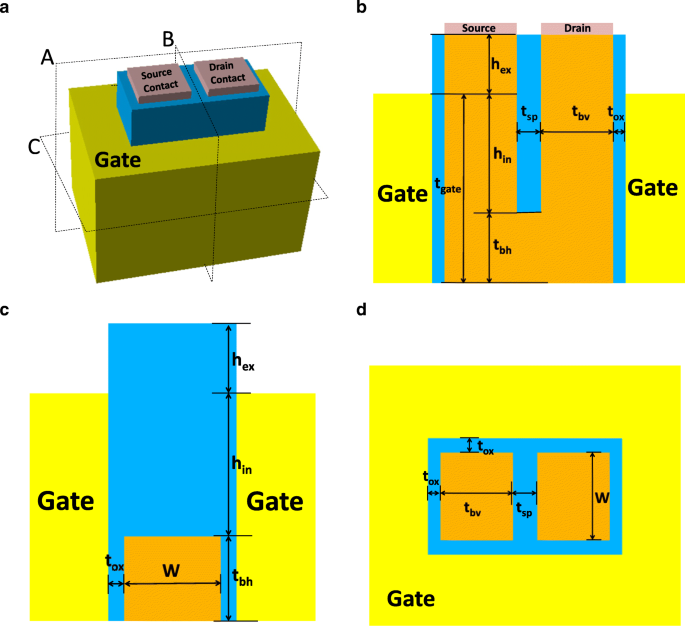
a Schematische 3D-Ansicht des RGUC-FET. b Profile des Geräts schneiden durch die Ebene A von a . c Profile des Geräts schneiden durch die Ebene B von a . d Profile des Geräts schneiden durch die Ebene C von a
Da die Siliziumkörperdicke weniger als 6 nm beträgt, werden in diesem Beitrag Quantensimulationen anstelle klassischer Simulationen eingeführt, um genauere Simulationsergebnisse zu erhalten. Alle Simulationen werden mit dem TCAD der SILVACO Atlas 3D-Gerätesimulation durchgeführt, unter Verwendung des konzentrationsabhängigen Mobilitätsmodells, des konzentrationsabhängigen Shockley-Read-Hall-Modells, des Auger-Rekombinationsmodells, des Bandlückenverengungsmodells, des Standard-Band-zu-Band-Tunnelmodells und Bohm-Quantenpotentialmodell [25]. Die Simulationsparameter sind in Tabelle 1 aufgeführt. Die beiden vertikalen Körperteile sind eigentlich Würfel mit vier Seiten, deren obere Oberflächen mit der Source- oder Drain-Region bedeckt sind und die untere Oberfläche beide mit dem horizontalen Körperteil verbunden sind. Die äußeren Tripelseiten der vertikalen Körperteile sind von dem Gateoxid und dem rechteckigen Gatekontakt umgeben, und die andere Innenseite ist mit dem inneren Abstandshalter im vertieften Bereich verbunden. Die vier Seiten des horizontalen Körpers sind alle von dem Gateoxid und dem rechteckigen Gatekontakt umgeben. Es ist anzunehmen, dass das rechteckige Gate aufgrund der oben erwähnten Strukturmerkmale eine starke Feldeffektsteuerfähigkeit sowohl für den horizontalen Körper als auch für die beiden vertikalen Teile hat. Und der innere Abstandshalter verlängert tatsächlich den Abstand des kürzesten Weges zwischen Source- und Drainkontakten im Silizium, was den Kurzkanaleffekt eliminieren könnte, der für Multi-Gate-Bauelemente mit planaren Kanalmerkmalen nicht vermieden werden kann. Im Vergleich zu anderen 3D-Kanalbauelementen [21,22,23,24] benötigt die vorgeschlagene Struktur keine Gate-Bildung im vertieften Bereich, was die Komplexität der inneren Struktur des vertieften Bereichs stark reduziert.
Ergebnisse und Diskussionen
Das Bohm-Quantenpotential (BQP)-Modell berechnet einen ortsabhängigen potentiellen Energieterm unter Verwendung einer Hilfsgleichung, die aus der Bohm-Interpretation der Quantenmechanik abgeleitet wurde. Dieses Modell ist aus der reinen Physik abgeleitet und ermöglicht es dem Modell, das Quantenverhalten verschiedener Geräteklassen sowie einer Reihe von Materialien anzunähern. Die Auswirkungen der Quantenbeschränkung auf die Geräteleistung, einschließlich I -V Eigenschaften, werden dann in guter Näherung berechnet. Frühere Studien haben gezeigt, dass der Gate-Leckstrom bei Oxiddicken von mehr als 0,5 nm vernachlässigbar ist [7, 26].
Abbildung 2a zeigt die Vergleiche des Drain-Source-Stroms Gate-Source-Spannung (I DS -V GS ) Eigenschaften des RGUC FET mit unterschiedlichen h in s sowohl auf logarithmischen als auch auf linearen Skalen. Abbildung 2b zeigt die Vergleiche von unterschwelligen Schwankungen (SS) und I EIN /Ich AUS Verhältnis des RGUC-FET mit unterschiedlichen h in S. Mit der Zunahme von h in , wird der vertikale Weg des gesamten Kanals von Source zu Drain kontinuierlich vergrößert, dann nimmt die kürzeste effektive Kanallänge allmählich zu und der Kurzkanaleffekt schwächt sich allmählich ab und wird schließlich eliminiert. Der SS kann einen nahezu idealen Wert von 65 mV/dec für h . erreichen in 10 nm erreicht. Das Ich EIN /Ich AUS Verhältnis erhöht sich auch für h . um das 35-fache in steigt von 2 auf 10 nm aufgrund des kontinuierlich verringerten SS an. Das verlängerte h in erhöht den Abstand des kürzesten Weges von Source zu Drain von 6 auf 22 nm, was 2 h . entspricht in + t sp und entspricht der effektiven Kanallänge der vorgeschlagenen Struktur. Abbildung 2c und d zeigen eine 2-D-Elektronenkonzentrationsverteilung im Siliziumkörper im ausgeschalteten Zustand für das Gerät mit 2 nm und 10 nm h in , bzw. Im Fall von 2 nm beträgt die höchste Elektronenkonzentration in der horizontalen Körperregion etwa 10 12 cm −3 und der Abstand zwischen Source/Drain-Kontakt und dem horizontalen Körperbereich ist sehr kurz. Danach beeinflusst die Source/Drain-Vorspannung die Elektronenverteilung im horizontalen Körperbereich ernsthaft; die Lösung besteht darin, den vertikalen Kanal zu verlängern, der die Source/Drain von der horizontalen Körperregion fernhält. Für den Fall von 10 nm können wir in Abb. 2d sehen, dass die höchste Elektronenkonzentration in der horizontalen Körperregion auf 10 9 . verringert wird cm −3 , und es ist ein idealerer vollständig verarmter Bereich für den Aus-Zustand, der einen viel geringeren Leckstrom mit sich bringt.

a Die Vergleiche des I DS -V GS Eigenschaften des RGUC FET mit unterschiedlichen h in s sowohl auf logarithmischen als auch auf linearen Skalen. b Die Vergleiche von subthreshold Swings (SS) und I EIN /Ich AUS Verhältnis des RGUC-FET mit unterschiedlichen h in S. c 2-D-Elektronenkonzentrationsverteilung im Siliziumkörper im ausgeschalteten Zustand für das Bauelement mit 2-nm h in . d 2-D-Elektronenkonzentrationsverteilung im Siliziumkörper im ausgeschalteten Zustand für das Bauelement mit 10 nm h in
Abbildung 3a zeigt die Vergleiche des I DS -V GS Eigenschaften des RGUC FET mit unterschiedlichen t sp s sowohl auf logarithmischen als auch auf linearen Skalen. Abbildung 3b zeigt die Vergleiche von unterschwelligen Schwankungen (SS) und I EIN /Ich AUS Verhältnis des RGUC-FET mit verschiedenen t sp S. Mit der Abnahme von t sp , wird auch der Abstand zwischen Source- und Drain-Kontakten kontinuierlich verringert. Der Leckstrom wird hauptsächlich durch einen Band-zu-Band-Tunnelstrom induziert. Die Tunnelwahrscheinlichkeit ist proportional zur Bandkrümmung, die der elektrischen Feldstärke an einem bestimmten Punkt äquivalent sein kann. Der Gesamttunnelstrom ist die Summe des Tunnelstroms, der in jedem Punkt der Körperregion erzeugt wird.
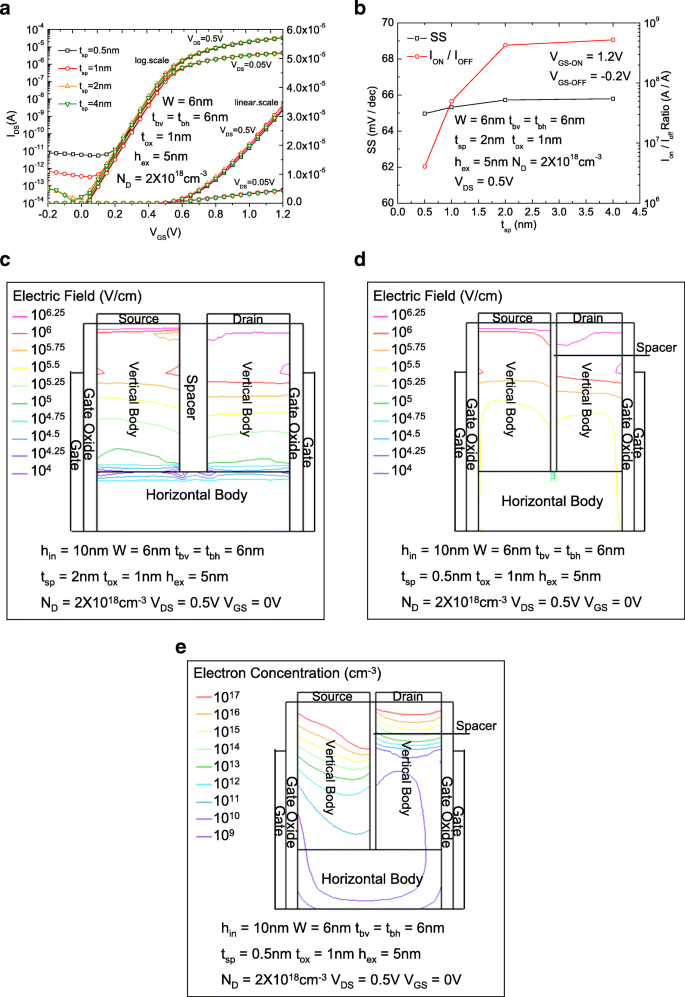
a Die Vergleiche des I DS -V GS Eigenschaften des RGUC FET mit unterschiedlichen t sp s sowohl auf logarithmischen als auch auf linearen Skalen. b Die Vergleiche von subthreshold Swings (SS) und I EIN /IAUS Verhältnis des RGUC-FET mit verschiedenen t sp S. c 2-D elektrische Feldverteilung im Siliziumkörper im ausgeschalteten Zustand für das Gerät mit 2 nm t sp . d 2-D elektrische Feldverteilung im Siliziumkörper im ausgeschalteten Zustand für das Gerät mit 0,5 nm t sp . e 2-D-Elektronenkonzentrationsverteilung im Siliziumkörper im ausgeschalteten Zustand für das Bauelement mit 0,5 nm t sp
Abbildung 3c und Abbildung 2d zeigen eine 2-D-Verteilung des elektrischen Felds im Siliziumkörper im ausgeschalteten Zustand für das Gerät mit 2 nm und 0,5 nm t sp , bzw. Für eine größere Abstandshalterdicke oder eine kleinere Drain-Source-Spannung (V DS ) Vorspannung, ist die elektrische Feldstärke an der Grenzfläche zwischen dem Abstandshalter im vertieften Bereich nicht stark genug, um einen großen Leckstrom zu erzeugen. Die stärkste elektrische Feldstärke tritt in der Nähe der Grenzfläche zwischen dem Gateoxid und dem vertikalen Körperteil auf, die durch V . bestimmt wird GD . Wenn jedoch der Source-Drain-Abstand auf weniger als 1 nm (weniger als die Gateoxiddicke) verringert wird, erscheint die stärkste Feldstärke nahe der Grenzfläche zwischen dem Abstandshalter im vertieften Bereich und den beiden vertikalen Körperteilen. Es ist zu sehen, dass wenn t sp kleiner als 1 nm ist, für ein größeres V DS (zum Beispiel 0,5 V), der Leckstrom ist fast unabhängig von der Gate-Vorspannung und wird hauptsächlich durch die V . bestimmt DS . Die SS ist mit t . fast unabhängig sp und hält einen nahezu idealen Wert von 65 mV/dec für eine h in = 10 nm Fall bis t sp weniger als 2 nm beträgt. Das Ich EIN /Ich AUS Verhältnis bleibt 10 8 bis t sp = 2 nm und ist für t . stark beeinträchtigt sp weniger als 2 nm aufgrund des durch das starke elektrische Feld induzierten Leckstromanstiegs erscheint nahe der Grenzfläche zwischen dem Abstandshalter im vertieften Bereich und den beiden vertikalen Körperteilen. Die elektrische Feldstärke des Siliziumkörpers in der Körperregion wird für die 0,5 nm t . umfassend erhöht sp Fall. Abbildung 3e zeigt die 2-D-Elektronenkonzentrationsverteilung im Siliziumkörper im ausgeschalteten Zustand für das Gerät mit 0,5 nm t sp . Im Vergleich zu Fig. 2d ist deutlich zu erkennen, dass die Elektronenkonzentration in der horizontalen Körperregion von 10 9 . vergrößert ist bis 10 10 cm −3 . Außerdem ist die Abmessung einer Abstandshalterdicke von 0,5 nm sehr nahe an einer Einzelmolekülschicht, was zu einer gewissen Beschädigung der Isolationseigenschaft der Abstandshalterschicht führen kann. Aus dem oben genannten Grund ist die t sp wird für hochintegriertes und leckagearmes Design mit niedrigem Stromverbrauch mit 2 nm empfohlen.
Abbildung 4 zeigt das I DS -V DS des vorgeschlagenen RGUC-FET mit optimierter Struktur unter verschiedenen.
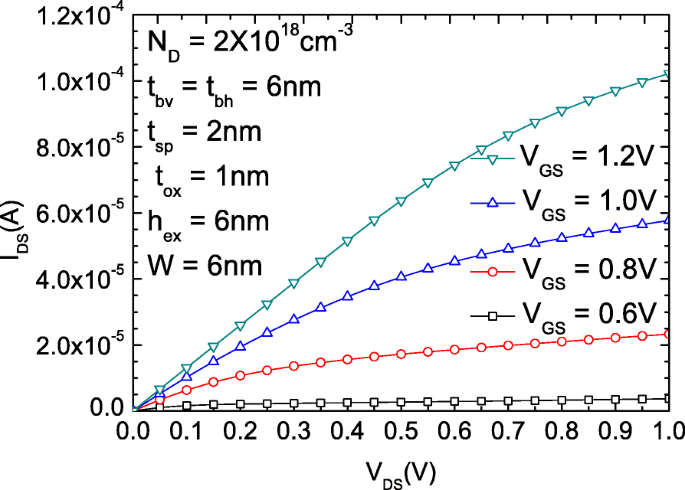
Ich DS -V DS Charakteristik des vorgeschlagenen RGUC-FET mit optimierten Geräteparametern
V GS Werte, deren SS etwa 63 mV/dec beträgt, und der I EIN/Ich AUS ist 10 9 ~ 10 10 . Der Sättigungsstrom steigt mit V GS erhöht.
Schlussfolgerungen
In diesem Beitrag wird ein neuartiger RGUC-FET mit hoher Integration und hoher Leistung vorgeschlagen, der Schwingungen unterhalb des Schwellenwerts und einen höheren I . aufweist EIN /Ich AUS Verhältnis. Der Abstand zwischen Source/Drain (S/D)-Kontakten kann auf 2 nm reduziert werden, mit nahezu idealen Eigenschaften wie SS, Sperrstrom und I EIN /Ich AUS Verhältnis. Alle elektrischen Eigenschaften werden mit Quantenmodellen simuliert, um genauere Ergebnisse zu gewährleisten.
Abkürzungen
- BQP:
-
Böhmisches Quantenpotential
- FET:
-
Feldeffekttransistor
- h ex :
-
Verlängerungshöhe des Abstandshalters zwischen S/D-Bereich
- h in :
-
Innenhöhe des Abstandshalters im vertieften Bereich
- I AUS :
-
Aus Strom
- I EIN :
-
Aktuell
- JL:
-
Verbindungslos
- MOS:
-
Metalloxid-Halbleiter
- N D :
-
Dopingkonzentration
- RGUC:
-
Rechteckiger Tor-U-Kanal
- S/D:
-
Quelle/Ablauf
- SS:
-
Schwung unter der Schwelle
- t bh :
-
Horizontale Körperdicke
- t bv :
-
Vertikale Körperdicke
- t Tor :
-
Vertikale Länge des Tors
- t Ochse :
-
Dicke der Gate-Oxidschicht
- t sp :
-
Abstandshalterdicke zwischen S/D-Bereich
- V DS :
-
Drain-Source-Spannung
- V GS :
-
Gate-Source-Spannung
- W:
-
Körperbreite
Nanomaterialien
- Unterschied zwischen Struktur und Klasse:Erklärt mit C++-Beispiel
- Unterschied zwischen while und do-while:An Beispielen erklärt
- Intelligentes Nanomaterial und Nanokomposit mit fortschrittlichen agrochemischen Aktivitäten
- Mehrschichtige SnSe-Nanoflake-Feldeffekttransistoren mit niederohmigen Au-Ohm-Kontakten
- Einfache Synthese von Silbernanodrähten mit unterschiedlichen Aspektverhältnissen und Verwendung als flexible, transparente Hochleistungselektroden
- UV-gehärtete, tintenstrahlgedruckte Silver Gate-Elektrode mit niedrigem spezifischen elektrischen Widerstand
- Reduzierter Kontaktwiderstand zwischen Metall und n-Ge durch Einfügen von ZnO mit Argon-Plasmabehandlung
- Kanal-Plasmon-Nanodraht-Laser mit V-Groove-Hohlräumen
- Graphenunterstützte thermische Grenzflächenmaterialien mit einem zufriedenstellenden Grenzflächenkontaktniveau zwischen Matrix und Füllstoffen
- Hochleistungskathodenmaterial aus FeF3·0.33H2O, modifiziert mit Kohlenstoffnanoröhren und Graphen für Lithium-Ionen-Batterien



