Auswirkungen der vermaschten p-Kontaktstruktur auf den Lichtextraktionseffekt für Flip-Chip-Leuchtdioden im tiefen Ultraviolettbereich
Zusammenfassung
In dieser Arbeit werden Flip-Chip-AlGaN-basierte Deep-Ultraviolett-Leuchtdioden (DUV-LEDs) mit verschiedenen vermaschten Kontaktstrukturen mittels der dreidimensionalen Finite-Difference-Time-Domain-Methode (3D-FDTD) systematisch untersucht. Es wird beobachtet, dass sowohl die transversal elektrische (TE) als auch die transversal magnetisch (TM)-polarisierte Lichtextraktionseffizienz (LEEs) empfindlich auf den Abstand und den Neigungswinkel der vermaschten Struktur reagiert. Wir stellen auch fest, dass der LEE nicht erhöht wird, wenn ein großer Füllfaktor für die vermaschten Strukturen verwendet wird, was auf die Konkurrenz zwischen der p-GaN-Schichtabsorption, der Al-Metall-Plasmonenresonanzabsorption und dem Streueffekt durch vermaschte Strukturen zurückzuführen ist . Der sehr starke Streueffekt, der bei den hybriden p-GaN-Nanostab/p-AlGaN-Nanokegelstumpfkontakten auftritt, kann den LEE sowohl für TE- als auch für TM-polarisiertes Licht enorm verbessern, z - und TM-polarisiertes Licht kann bei einer Emissionswellenlänge von 280 nm um das ~ 5-fache bzw. ~ 24-fache erhöht werden.
Einführung
AlGaN-basierte tief-ultraviolette Leuchtdioden (DUV-LEDs) haben große Anwendungspotenziale in Bereichen wie Wasserreinigung, medizinische Phototherapie, Detektion und Photokatalyse [1,2,3]. DUV-LEDs mit einer hohen externen Quanteneffizienz (EQE) sind jedoch immer noch schwierig zu erhalten, insbesondere wenn die Emissionswellenlänge abnimmt. Die EQE für LED kann durch das Produkt der internen Quanteneffizienz (IQE) berechnet werden, die als η . bezeichnet wird IQE und die Lichtextraktionseffizienz (LEE), bezeichnet als η LEE , d. h. η EQE =η IQE · η LEE . Derzeit liegt der EQE für konventionelle Flip-Chip-strukturierte DUV-LEDs unter 10 %, was durch den niedrigen LEE von 7–9 % stark limitiert wird [4]. Der bisher höchste EQE-Weltrekord für DUV-LEDs liegt bei 20 % bei einer Wellenlänge von 275 nm, und ein solch hoher EQE wird dank des bemerkenswert verbesserten LEE erreicht, der durch die Integration verschiedener fortschrittlicher LEE-Technologien wie gemustertem Saphirsubstrat, transparente p-Elektrode und fortschrittliche Gehäusetechnologie [5]. Daher wird die Verbesserung des LEE zum Realisieren hocheffizienter DUV-LEDs von wesentlicher Bedeutung. Es ist bekannt, dass der LEE wesentlich von der Totalreflexion (TIR) und dem Fresnel-Verlust beeinflusst wird, der durch den großen Brechungsindexkontrast zwischen AlGaN und Luft (n Luft =1 und n AlGaN =2,6) [6]. Darüber hinaus führt die Erhöhung des Al-Gehalts in AlGaN-basierten Quantentöpfen zur Dominanz von transversal magnetisch (TM)-polarisiertem Licht, das sich nur schwer in den Austrittskegel ausbreiten kann, bevor es aus den DUV-LEDs extrahiert wird [7]. Um den LEE zu erhöhen, wurden einerseits verschiedene Technologien wie aufgeraute Oberflächen [8], strukturierte Saphirsubstrate [9], geneigte Seitenwände [10] und Oberflächenplasmapolaritonen [11] umfassend angewendet, und dadurch die Streuung Zentren erzeugt werden, die dazu beitragen, die Fluchtwahrscheinlichkeit für Photonen aus dem Saphirsubstrat zu erhöhen. Ein weiteres Hindernis, das den LEE begrenzt, ergibt sich aus der absorbierenden p-GaN-Kontaktschicht wegen der Schwierigkeit, eine Al-reiche p-AlGaN-Schicht mit hoher Lochkonzentration zu züchten [5]. Daher ist es wichtig, die optische Absorption, die durch die p-GaN-Schicht für DUV-LEDs verursacht wird, zu reduzieren. Zu den vorgeschlagenen Methoden gehören vermaschte p-Kontaktelektroden [12, 13], verteilter Bragg-Reflektor (DBR)/omnidirektionaler Reflektor (ODR) [14, 15] und photonischer Kristall [16]. Unter den vorgeschlagenen Ansätzen ist eine vermaschte Kontaktelektrode vom p-Typ effektiv und weniger kostspielig. Loboet al. berichteten über p-Kontaktmuster im Mikrometerbereich und erwiesen sich als wirksam bei der Verbesserung der Lichtextraktion [13]. Die Untersuchung von vermaschten p-Kontaktelektroden im Nanometerbereich wird jedoch selten durchgeführt. Außerdem wurde der Streueffekt der vermaschten p-Kontaktelektroden im Mikrometerbereich auf den LEE in früheren Berichten vernachlässigt. Wir glauben, dass der Streueffekt in den p-Kontaktelektroden im Nanometerbereich den LEE weiter erhöhen kann.
In diesem Artikel wird der Einfluss einer nanoskaligen vermaschten Kontaktstruktur und eines Al-Reflektors auf den LEE für DUV-LEDs numerisch untersucht. Es werden verschiedene vermaschte Kontaktstrukturen untersucht, darunter p-GaN-Nanostäbchenkontakte, hybride p-GaN-Nanostäbchen/p-AlGaN-Nanostäbchenkontakte und hybride p-GaN-Nanostäbchen/p-AlGaN-Nanokegelstumpfkontakte. Diese Arbeit untersucht die Abhängigkeit von LEE von variablen Parametern für die vorgeschlagenen Strukturen unter Verwendung einer dreidimensionalen Finite-Difference-Time-Domain (3D FDTD) Simulation. Wir stellen fest, dass die LED mit optimierten hybriden p-GaN-Nanostäbchen/p-AlGaN-Kegelstumpf-Nanokonus-Netzkontakten eine mehr als 5-fache bzw. 24-fache LEE-Verstärkung für transversal elektrisches (TE)- bzw. TM-polarisiertes Licht ermöglicht.
Modell- und Simulationsmethoden
Der in unserer Arbeit verwendete Simulator wurde von Lumerical FDTD Solution entwickelt, die die zeitabhängigen Maxwell-Gleichungen lösen kann, um elektromagnetische Feldverteilungen in endlichen Strukturen zu berechnen [17, 18]. Abbildung 1a zeigt das Simulationsmodell für die herkömmlichen Flip-Chip-DUV-LEDs. Oben auf der simulierten Struktur ist eine Schicht aus Al-Reflektor befestigt, um Photonen zurück zum transparenten Saphir zu reflektieren, damit das meiste Licht extrahiert werden kann [19]. Beachten Sie, dass der Al-Reflektor eine Reflektivität von bis zu 92% im UV-Spektralbereich hat [20]. Der Metalldissipationsmechanismus wird während der Simulation durch das modifizierte Drude-Modell beschrieben [21]. Die Dicken für die p-GaN-Schicht, die n-AlGaN-Schicht und den Saphir sind auf 100 nm, 1,5 µm bzw. 1 µm eingestellt [12]. Zwischen der n-AlGaN-Schicht und der p-AlGaN-Schicht sind mehrere Quantentöpfe (MQWs) eingebettet, deren Gesamtdicke 100 nm beträgt. Außerdem setzen wir einen einzelnen Dipol in der Mitte der MQWs-Region und den Dipol, der die Elektron-Loch-Rekombination repräsentiert [22]. Die Spitzenemissionswellenlänge des Spektrums für die Dipolquelle ist auf 280 nm eingestellt. Die Dipolquelle ist in der Richtung entweder parallel oder senkrecht zum X . polarisiert -Achse zur Anregung des TE- bzw. TM-Modus [23]. Das Z -Achse ist bei DUV-LEDs senkrecht zur C-Ebene. Daher breitet sich das TE-polarisierte und das TM-polarisierte Licht hauptsächlich in der YZ- bzw. XY-Ebene aus. Die Absorptionskoeffizienten bei der Emissionswellenlänge von 280 nm für die AlGaN-Schicht, die MQWs und die GaN-Schicht werden mit 10 cm –1 . angenommen , 1000 cm −1 , und 170.000 cm −1 , bzw. Die Materialbrechungsindizes für die AlGaN-Schicht, die GaN-Schicht und den Saphir werden mit 2,6, 2,9 bzw. 1,8 angenommen [23, 24]. Die seitliche Abmessung für die berechnete Struktur wird auf 8 × 8 μm 2 . eingestellt . Die Randbedingungen für die vier seitlichen Grenzen werden mit einem Reflexionsgrad von 100 % angenommen, so dass die endlichen seitlichen Abmessungen als unendlich angenommen werden können [25]. Die Bedingungen für die obere und untere Grenze werden auf eine perfekt abgestimmte Schicht (PML) eingestellt, die die elektromagnetische Energie vollständig absorbieren kann. In unseren Modellen wird bei der Durchführung von Simulationen ein ungleichmäßiges Netz verwendet und die kleinste Netzgröße auf 5 nm eingestellt, was eine gute Genauigkeit bei der Berechnung des LEE bietet. Der Leistungsmonitor ist 300 nm vom Saphir entfernt angeordnet, um die Energieübertragung durch den Monitor zu erfassen und die Strahlung des elektrischen Nahfeldes aufzuzeichnen. Das elektrische Nahfeldfeld wird in das elektrische Fernfeldfeld umgewandelt, indem die Fourier-Transformation durchgeführt wird. Der LEE wird berechnet, indem das Verhältnis der gesamten vom Leistungsmonitor gesammelten extrahierten Leistung und der gesamten Emissionsleistung des Dipols genommen wird [26]. Die vom Leistungsmonitor gesammelte Leistung wird durch die Integration der Fernfeld-Leistungsverteilung über die Fläche des Leistungsmonitors gewonnen.
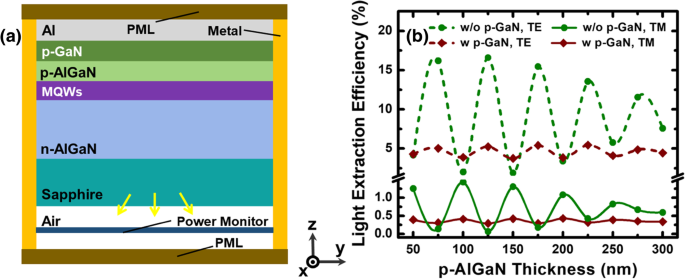
a Schematische Seitenansicht von 3D-FDTD-Berechnungsmodellen für eine konventionelle Flip-Chip-DUV-LED-Struktur. b TE- und TM-polarisierte LEEs für DUV-LED mit p-GaN und ohne p-GaN in Abhängigkeit von der p-AlGaN-Dicke
Ergebnisse und Diskussionen
Auswirkung der Dicke des optischen Hohlraums auf LEE
Bekanntlich kann der optische Resonatoreffekt den Strahlungsmodus für MQWs in Flip-Chip-LEDs abstimmen, der auf die Schichtdicke des p-Typs empfindlich ist, während die Schichtdicke des p-Typs einen signifikanten Einfluss auf den LEE hat [27] . Daher untersuchen wir zunächst den Einfluss der p-AlGaN-Schichtdicke auf die TE-polarisierten und TM-polarisierten LEEs für konventionelle LED-Strukturen. Die Dicke der p-AlGaN-Schicht repräsentiert auch den Abstand zwischen MQWs und Al-Reflektor. Wie in Fig. 1b gezeigt, zeigen alle LEE-Kurven eine periodische Schwingung mit der p-AlGaN-Schichtdicke und die Periode beträgt etwa 50 nm. Das oszillierende Verhalten ist auf den optischen Hohlraumeffekt zurückzuführen, der durch die konstruktive Interferenz zwischen dem Licht von der Quelle und dem vom Al-Spiegel reflektierten Licht eingeführt wird. Nach der Interferenztheorie kann die Periode berechnet werden durch Δd =λ /2n AlGaN =53 nm [21], was gut mit den simulierten Ergebnissen in Abb. 1b übereinstimmt. Außerdem sind die Peak-LEEs für TM-polarisiertes Licht entgegengesetzt zu denen für TE-polarisiertes Licht. Nach den Fresnel-Gleichungen und der Mueller-Matrix [28] gibt es unterschiedliche Reflexionsamplituden und Phasenverschiebungen für die Reflexion des TE- und TM-polarisierten Lichts an der Grenzfläche zwischen zwei linear isotropen Medien. Darüber hinaus kann festgestellt werden, dass der LEE für LEDs mit 100 nm dicker p-GaN-Schicht immer noch eine geringe Amplitudenschwankung zeigt, obwohl die starke Absorption der p-GaN-Schicht den optischen Hohlraumeffekt schwächt. Der schwächere optische Resonatoreffekt für LEDs mit p-GaN-Schicht führt dazu, dass sowohl für TE- als auch für TM-polarisiertes Licht der minimale LEE für die LED mit p-GaN-Schicht größer ist als für die LED ohne p-GaN Schicht wie in Abb. 1b gezeigt. Inzwischen kann auch beobachtet werden, dass der durchschnittliche LEE für TM-polarisiertes Licht nur ein Zehntel von dem für TE-polarisiertes Licht beträgt, und die Ergebnisse hier stimmen mit den Ergebnissen in [23] überein. Außerdem ist anzumerken, dass die LEDs ohne p-GaN-Schicht die größten LEEs für TE-polarisiertes Licht und TM-polarisiertes Licht mit 16 % bzw LEDs mit p-GaN-Schicht bzw. Daher kann für LEDs ohne p-GaN-Schicht eine dreifache Verbesserung des LEE erzielt werden, was darauf hinweist, dass sowohl TE- als auch TM-polarisiertes Licht von der p-GaN-Schicht signifikant absorbiert werden kann. Dies liegt daran, dass einige Lichter mehrfache Reflexionen erfahren müssen, um zu entweichen, und die optimierte Dicke von p-AlGaN bewirkt auch den besten optischen Hohlraumeffekt. Daher ist die Verringerung der Absorption von p-GaN für den LEE von DUV-LEDs sehr wichtig und kann zu einer mehr als doppelten Erhöhung des LEE führen.
Auswirkung der vermaschten p-GaN-Kontakte auf LEE
Um die Absorption der p-GaN-Schicht zu reduzieren, wird p-GaN in Submikrokontakte eingearbeitet, um den LEE zu erhöhen. Basierend auf der herkömmlichen Flip-Chip-DUV-LED in Abb. 1a ist die p-GaN-Schicht für Nanostäbe ausgelegt, die in den Al-Reflektor eingebettet sind, um die p-Submikrokontaktelektrode (siehe Abb. 2a) mit einem quadratischen Array zu bilden (siehe Abb. 2b). Die Höhe für p-GaN-Nanostäbe ist auf 100 nm eingestellt. Der Durchmesser für p-GaN-Nanostäbe ist auf 250 nm festgelegt, was einer Zahl nahe der Emissionswellenlänge entspricht. Die optimierte p-AlGaN-Schichtdicke wird gemäß Abb. 1b auf 125 nm eingestellt. Bei der DUV-LED mit vermaschten p-GaN-Kontakten ist der Abstand am wichtigsten. Einerseits soll der kleinere Abstand die Stromverteilung in den gesamten aktiven Bereich effizienter machen. Andererseits erhöht der kleinere Abstand den Füllfaktor von vermaschten p-GaN-Kontakten und erhöht somit die optische Absorption. Daher ist ein optimierter Abstand, der sowohl eine gute Stromverteilung als auch einen ausgezeichneten LEE ermöglicht, für die vorgeschlagenen DUV-LEDs sehr kritisch. Anschließend untersuchen und zeigen wir den Effekt des Abstands auf den LEE in Abb. 2c. Erwartungsgemäß sind die TE-polarisierten und die TM-polarisierten LEEs für DUV-LEDs mit vermaschten p-GaN-Kontakten gegenüber der herkömmlichen DUV-LED deutlich verbessert. Der LEE für das TE-polarisierte Licht nimmt mit zunehmendem Abstand zu, bis der Abstand 125 nm erreicht, da die Absorption von p-GaN infolge des abnehmenden Füllfaktors von p-GaN abnimmt. Und die LEEs haben eine mehr als dreifache Verbesserung, wenn der Abstand etwa 125 nm beträgt. Nach 125 nm nimmt der LEE für das TE-polarisierte Licht jedoch mit dem Füllfaktor ab. Die Beobachtungen, wenn der Abstand über 125 nm liegt, lassen darauf schließen, dass ein weiterer Faktor einen wichtigen Einfluss auf den LEE hat. Gemäß dem Bericht in [29] kann die Extinktionslänge des Photons durch 1/L . ausgedrückt werden Aussterben =1/L Streuung + 1/L Aufnahme , wobei L Streuung und L Aufnahme entsprechen der Streulänge bzw. der Absorptionslänge. Da der LEE hauptsächlich von der Materialabsorption und der strukturellen Streuung abhängt, kann gefolgert werden, dass der durch die vermaschten p-GaN-Kontakte verursachte Streueffekt den LEE dominant beeinflusst, wenn der Abstand größer als 125 nm ist.

a Schematische Seitenansicht der Flip-Chip-DUV-LED mit vermaschten p-GaN-Kontakten. b Schematische Draufsicht der vermaschten p-GaN-Kontaktverteilung. c LEEs für DUV-LED mit den vermaschten p-GaN-Kontakten als Funktion des Abstands der Nanostäbe bei einer p-AlGaN-Dicke von 125 nm
Um den Streueffekt durch die vermaschten p-GaN-Kontakte zu bestätigen, wird ein Modell ohne absorbierendes Material so eingestellt, dass der Absorptionskoeffizient für GaN-Material auf 0 gesetzt wird und der Al-Reflektor durch den perfekten elektrischen Leiter (PEC) mit fast 100 . ersetzt wird % Reflektivität, für die die Simulationsergebnisse mit schwarzen Quadratlinien in Abb. 3a aufgetragen sind. Es ist ersichtlich, dass der LEE mit zunehmendem Abstand zu- und dann abnimmt. Der Streueffekt des p-GaN-Submikrokontakts ist nämlich inkrementell und nimmt dann mit zunehmendem Raum ab. Daher unterdrückt der vergrößerte Abstand für die vermaschten p-Typ-GaN-Kontakte den Streueffekt, und dies interpretiert die Beobachtung in Fig. 3a, dass, wenn der Abstand größer als 50 nm ist, der LEE mit zunehmendem Abstand abnimmt.
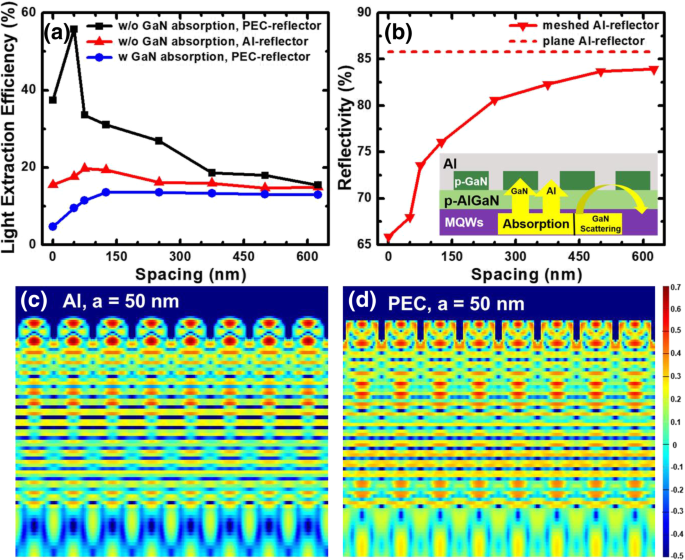
a LEEs als Funktion des Nanostababstands für DUV-LEDs mit den 100 nm hohen nicht-absorptiven/absorptiven p-GaN-Nanostäben, und die Reflektoren sind Al bzw. PEC. b Reflektivität bei senkrechtem Einfall mit vermaschten Al-Reflektor und ebenen Al-Reflektor in Abhängigkeit vom Nanostababstand. Der Einschub zeigt den Effekt der p-GaN-Schichtabsorption, der Al-Metallabsorption und der Strukturstreuung in DUV-LEDs mit vermaschten p-GaN-Kontakten. Querschnittsverteilungen des elektrischen Feldes bei einem Nanostababstand von 50 nm mit c Al und d PEC-Reflektor
Wenn die Absorption von GaN auf 0 eingestellt wird und ein Al-Reflektor angewendet wird, nimmt der LEE außerdem zuerst zu und nimmt dann als rote Dreieckslinie ab, die in Fig. 3a gezeigt ist. Allerdings ist der maximale LEE von 20 % für die Struktur mit Al-Reflektor weitaus kleiner als der von 56 % für die Struktur mit PEC-Reflektor. Abbildung 3b zeigt die Abhängigkeit der Reflektivität vom Abstand für den vermaschten Al-Reflektor. Das Reflexionsvermögen für vermaschten Al-Reflektor nimmt mit abnehmendem Abstand ab. Mit anderen Worten, die Al-Metalloberfläche wird rauh, wenn sich der Abstand verringert. Daher kann die Abnahme der Reflektivität für raue Metalloberflächen auf die Anregung von Oberflächenplasmonen und den Oberflächeneffekt zurückgeführt werden [30,31,32]. Eine raue Metalloberfläche muss die Phase des einfallenden Lichts modulieren, was zu absorbiertem Licht und Oberflächenwellenanregung (Oberflächenplasmonen) führt. Der Oberflächeneffekt führt zum Einfangen des Lichts in den Vertiefungen der Oberfläche mit eventueller Absorption. Außerdem ist die Querschnittsverteilung des elektrischen Felds unter Verwendung einer ebenen Welle als Einfallsquelle für den Al-Reflektor und den PEC-Reflektor in den Fig. 2 und 3 gezeigt. 3c bzw. d. Es kann festgestellt werden, dass die p-GaN-Nanostäbchen für die LED mit Al-Reflektor die stärkste lokale elektrische Feldstärke besitzen, aber solche Beobachtungen sind bei den p-GaN-Nanostäbchen für die LED mit PEC-Reflektor weniger offensichtlich, was bestätigt, dass eine Oberflächenplasmonenresonanzabsorption für einen vermaschten Al-Reflektor. Darüber hinaus kann ein ähnlicher LEE-Trend beobachtet werden, wie die blaue Kreislinie in Abb. 3a zeigt, wenn unser Modell die Absorption der p-GaN-Schicht und den PEC-Reflektor berücksichtigt. Der LEE wird bei der LED ohne GaN-Absorption und mit PEC-Reflektor (rote Dreieckslinie) größer, was anzeigt, dass die Absorption der p-GaN-Schicht schwerwiegender ist als die Metallabsorption. Daher besteht bei DUV-LED mit vermaschten p-GaN-Kontakten eine Konkurrenz zwischen der p-GaN-Schichtabsorption, der Al-Metallabsorption und der Strukturstreuung, wie in der Einfügung von Fig. 3b gezeigt. Wenn der Abstand zu klein ist, wird der LEE durch die Absorption der p-GaN-Schicht und des Metalls stark beeinflusst, während die Strukturstreuung einen primären Effekt auf den LEE hat, wenn der Abstand groß wird.
Außerdem untersuchen wir weiter den Einfluss der Höhe der p-GaN-Nanostäbe auf den LEE für DUV-LEDs. Die Abstandsabhängigkeit von LEEs bei verschiedenen p-GaN-Nanostabhöhen von 10 nm, 25 nm, 50 nm und 100 nm ist in 4a gezeigt. Der LEE nimmt zu, wenn die Nanostabhöhe von 100 auf 25 nm abnimmt. Es ist offensichtlich, dass die Zunahme von LEE auf die schwächere Absorption der dünneren p-GaN-Schicht zurückgeführt wird. Fig. 4a zeigt jedoch auch, dass die LEEs ähnlich sind, wenn die Nanostabhöhen 25 nm und 10 nm betragen. Wie in 4b gezeigt, steigt das Reflexionsvermögen von Al-Metall mit p-GaN-Nanostäben mit abnehmender Nanostabhöhe schneller an. Daher kann gefolgert werden, dass der Streueffekt bei 25 nm Höhe stärker ist als bei 10 nm Höhe, was einen ähnlichen LEE erzeugt. Nichtsdestotrotz beträgt der größte LEE 15 %, wenn die p-GaN-Nanostäbchen eine Höhe von 100 nm aufweisen, und der maximale LEE beträgt nur 18 %, wenn die p-GaN-Nanostäbchen eine Höhe von 25 nm aufweisen; somit wird ein kleiner Unterschied erhalten. Dies wird hauptsächlich der stark absorbierenden p-GaN-Schicht zugeschrieben, wie im Einschub von Fig. 4a gezeigt. Bei einer 10 nm dicken p-GaN-Schicht können nur 40% des Lichts reflektiert werden, sodass das reflektierte Licht hauptsächlich vom Al-Reflektor unter den p-GaN-Nanostäben stammt. Folglich wird das Reflexionsvermögen eher durch den Abstand als durch die Höhe der p-GaN-Nanostäbe beeinflusst. Daher beeinflusst die Höhe der p-GaN-Nanostäbchen im Vergleich zum Nanostababstand weniger den LEE.
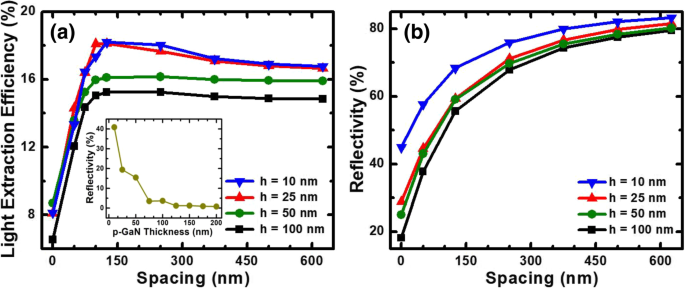
(a) LEEs als Funktion des Nanostababstands für DUV-LED mit Al-Reflektor und mit den p-GaN-Nanostabhöhen von 10, 25, 50 und 100 nm werden eingestellt. Einschub:Reflektivität des senkrechten Einfalls für konventionelle DUV-LED in Abhängigkeit von der p-GaN-Schichtdicke und b Reflexionsvermögen des senkrechten Einfalls als Funktion des Nanostababstands, wenn die p-GaN-Nanostabhöhen 10, 25, 50 und 100 nm betragen
Auswirkung der hybriden p-GaN/p-AlGaN-Netzkontakte auf LEE
Darüber hinaus schlagen wir eine hybride p-GaN/p-AlGaN-Netzkontaktschicht vor, wie in Fig. 5a gezeigt. Die Höhe und der Durchmesser für p-GaN-Nanostäbchen sind auf 100 nm bzw. 250 nm eingestellt. Die p-AlGaN-Nanostabhöhe (H ) ist in diesem Fall eine Variable. Die LEEs für verschiedene DUV-LEDs in Bezug auf den Nanostababstand sind in Abb. 5b gezeigt, für die wir die Werte von H . setzen auf 0 nm, 25 nm, 75 nm und 100 nm. Es zeigt sich, dass die LEEs für DUV-LEDs mit verschiedenen hohen p-AlGaN-Nanostäbchen größer sind als die ohne p-AlGaN-Nanostäbchen (H =0 nm). Und die LEEs für DUV-LEDs werden weniger von der Höhe der p-AlGaN-Nanostäbe beeinflusst, wenn H ist nicht 0 nm. Der Einschub in Abb. 5b zeigt die normale Reflektivität in Bezug auf den Nanostababstand für die Hybridstruktur, und wir können sehen, dass die Höhe der p-AlGaN-Nanostäbchen einen vernachlässigbaren Einfluss auf die Reflektivität hat. Daher wird der Streueffekt durch p-AlGaN-Nanostäbchen lediglich verstärkt, was somit zu dem verbesserten LEE führt. Die Fernfeld-Strahlungsmuster für DUV-LEDs mit 75-nm- und 0-nm-hohen p-AlGaN-Nanostäbchen bei einem Nanostababstand von 125 nm sind in den Fig. 1 und 2 gezeigt. 5c bzw. d. Es ist zu beobachten, dass die elektrische Feldstärke von DUV-LEDs mit 75 nm hohen p-AlGaN-Nanostäbchen (siehe Abb. 5c) stärker ist als mit 0 nm hohen p-AlGaN-Nanostäbchen (siehe Abb. 5d). Die elektrische Feldverteilung für DUV-LEDs mit 75-nm-hohen p-AlGaN-Nanostäben ist größer als die mit 0-nm-hohen p-AlGaN-Nanostäben, was bestätigt, dass die p-AlGaN-Nanostäbe die Streuwirkung für Licht verbessern. Abbildung 5e zeigt, dass TM-polarisiertes LEE noch geringfügiger von der Höhe der p-AlGaN-Nanostäbe beeinflusst wird.

a Schematische Seitenansicht einer Flip-Chip-DUV-LED mit hybriden p-GaN/p-AlGaN-Nanostab-basierten vermaschten Kontakten. b LEEs für TE-polarisiertes Licht als Funktion des Nanostababstands und der p-AlGaN-Nanostabhöhen werden auf 0, 25, 75 und 100 nm eingestellt. Einschub:Reflektivität des senkrechten Einfalls für DUV-LED mit dem 100 nm hohen p-GaN und mit der p-AlGaN-Höhe von 0, 25, 75 und 100 nm als Funktion des Nanostababstands. Fernfeld-Strahlungsmuster in einem Abstand von 125 nm mit einer p-AlGaN-Höhe von c 75 nm und d 0 nm. e LEEs für TM-polarisiertes Licht als Funktion des Nanostababstands und der p-AlGaN-Nanostabhöhen werden auf 0, 25, 75 und 100 nm eingestellt
Unsere vorherige Analyse zeigt, dass das TM-polarisierte Licht immer noch unter einem extrem niedrigen LEE leidet. Als Ergebnis sollen Methoden vorgeschlagen werden, um das TM-polarisierte Licht zu streuen. Zu diesem Zweck schlagen wir p-AlGaN-Nanostäbe mit geneigten Seitenwänden vor, wodurch die in Abb. 6a gezeigte p-AlGaN-Nanokegelstumpfstruktur gebildet wird. Die Höhe der abgestumpften p-AlGaN-Nanokegel ist auf 75 nm eingestellt und der Neigungswinkel ist auf α . definiert . Eine bemerkenswerte LEE-Verbesserung sowohl für TE- als auch für TM-polarisiertes Licht mit dem verringerten α ist in den Abb. 6b bzw. c. Für den Neigungswinkel α =30°, ist es unmöglich, eine kleinere Periode einzustellen, da die abgestumpften p-AlGaN-Nanokegel dicht gepackt sind, wenn der Abstand der p-GaN-Nanostäbe 260 nm beträgt. Der größte TE-polarisierte LEE erreicht 26%, wenn der Abstand 375 nm beträgt und α ist auf 30° eingestellt. Diese Zahl ist 1,44-mal größer als das Design in Abb. 5a. Es ist bemerkenswerter, dass verglichen mit der Struktur in Fig. 5a der größte TM-polarisierte LEE für das Design in Fig. 6a 12% beträgt, wenn der Abstand 260 nm und α . beträgt auf 30° eingestellt und diese Zahl wird um das Zehnfache erhöht. Verglichen mit der herkömmlichen DUV-LED ohne vermaschte Strukturen können sowohl TE- als auch TM-polarisierte LEEs durch Verwendung des Designs in Fig. 6a um mehr als das 5-fache bzw. 24-fache erhöht werden. Diese simulierten Ergebnisse zeigen, dass ein abgestumpfter p-AlGaN-Nanokonus mit einem Neigungswinkel von 30° den Lichtstreuungseffekt insbesondere für TM-polarisiertes Licht erheblich verbessern kann.
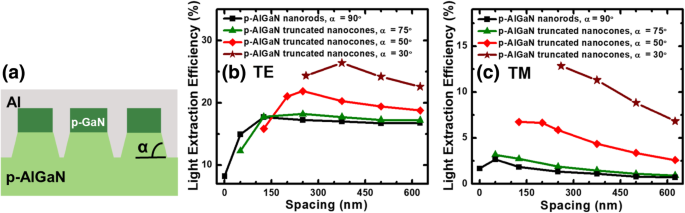
a Schematische Seitenansicht einer Flip-Chip-DUV-LED mit hybriden p-GaN-Nanostäbchen/p-AlGaN-Nanokonus-Kegelstumpfkontakten. LEEs von TE-polarisiertem Licht (b ) und von TM-polarisiertem Licht (c ) als Funktion des Nanostababstands für DUV-LEDs, und die Strukturen sind mit dem 100 nm hohen p-GaN und 75 nm hohen p-AlGaN (die Neigungswinkel sind auf 30°, 50°, 75° . eingestellt) , und 90°)
Schlussfolgerungen
Zusammenfassend wird der Einfluss verschiedener vermaschter Kontaktstrukturen, einschließlich p-GaN-Nanostäbchen, hybriden p-GaN/p-AlGaN-Nanostäbchen und p-GaN-Nanostäbchen/p-AlGaN-Nanokegelstumpf, auf den LEE für DUV-LEDs detailliert untersucht. Es ist erwiesen, dass die p-GaN-Schichtabsorption und die Al-Metallabsorption eine Hauptrolle im LEE für Strukturen mit kleinerem Nanostababstand spielen, während das Streuvermögen der vermaschten Struktur einen dominierenden Beitrag zum LEE für Strukturen mit größerem Nanostababstand leistet. Es ist erwähnenswert, dass trotz einer sehr deutlichen LEE-Verstärkung für TE-polarisiertes Licht weder der p-GaN-Nanostab noch der hybride p-GaN/p-AlGaN-Nanostab den LEE für das TM-polarisierte Licht signifikant fördern kann, was auf die sehr schlechte Streuwirkung auf das Licht in der Ebene. Daher schlagen und beweisen wir weiter, dass der LEE für das TM-polarisierte Licht durch die Kombination von p-GaN-Nanostäbchen und abgeschnittenem p-AlGaN-Nanokonus signifikant verbessert werden kann und dass der optimierte Neigungswinkel 30° beträgt. Gegenüber der herkömmlichen DUV-LED ohne Netzstruktur kann damit eine 24-fache Verstärkung im TM-polarisierten LEE erreicht werden.
Abkürzungen
- 3D-FDTD:
-
Dreidimensionale Finite-Differenzen-Zeitbereichsmethode
- DBR:
-
Verteilter Bragg-Reflektor
- DUV-LEDs:
-
Leuchtdioden im tiefen Ultraviolett
- EQE:
-
Externe Quanteneffizienz
- IQE:
-
Interne Quanteneffizienz
- LEE:
-
Lichtextraktionseffizienz
- MQWs:
-
Mehrere Quantentöpfe
- ODR:
-
Omnidirektionaler Reflektor
- PEC:
-
Perfekter elektrischer Leiter
- PML:
-
Perfekt abgestimmte Schicht
- TE:
-
Quer elektrisch
- TIR:
-
Totale interne Reflexion
- TM:
-
Quermagnetisch
Nanomaterialien
- Plädoyer für neuromorphe Chips für KI-Computing
- Auswirkung von UV-Bestrahlung auf die Eigenschaften von 4H-SiC-PiN-Dioden
- Die Wirkung von Kontakt-Nichtgleichgewichtsplasma auf die strukturellen und magnetischen Eigenschaften von Mn Х Fe3 − X О4 Spinellen
- Grüne Synthese von InP/ZnS-Kern/Schale-Quantenpunkten für die Anwendung in schwermetallfreien Leuchtdioden
- Entwicklung der Kontaktfläche bei Normallast für raue Oberflächen:von atomaren zu makroskopischen Skalen
- Auswirkung verschiedener Bindemittel auf die elektrochemische Leistung einer Metalloxidanode für Lithium-Ionen-Batterien
- Fast Effizienz-Droop-Free AlGaN-basierte UV-Licht emittierende Dioden mit einer speziell entwickelten Übergitter-Elektronenblockierschicht vom p-Typ für eine hohe Mg-Dotierungseffizienz
- Einfluss von Morphologie und Kristallstruktur auf die Wärmeleitfähigkeit von Titanoxid-Nanoröhren
- Effektive Lichtabsorption mit doppelseitigen Pyramidengittern für Dünnschicht-Silizium-Solarzellen
- Engineering des Lichtflusses



