Ge-pMOSFETs mit GeOx-Passivierung durch Ozon- und Plasma-Nachoxidation
Zusammenfassung
Eine Vergleichsstudie zur elektrischen Leistung von Ge-pMOSFETs mit einem GeOx Passivierungsschicht, die durch Ozon-Nachoxidation (OPO) und Plasma-Nachoxidation (PPO) gebildet wird, durchgeführt. PPO und OPO wurden auf einem Al2 . durchgeführt O3 /n-Ge (001)-Substrat gefolgt von einem 5-nm-HfO2 Gatedielektrikum in situ in einer ALD-Kammer abgeschieden. Die Qualität der Dielektrikum/Ge-Grenzflächenschicht wurde durch Röntgenphotoelektronenspektroskopie und Transmissionselektronenmikroskopie charakterisiert. Die PPO-Behandlung führt zu einer positiven Schwellenspannung (V TH ) Verschiebung und ein niedrigeres I EIN /Ich AUS Verhältnis, was auf eine schlechte Schnittstellenqualität hinweist. Ge pMOSFETs mit OPO weisen ein höheres I . auf EIN /Ich AUS Verhältnis (bis zu vier Größenordnungen), verbessertes Schwingen unterhalb der Schwelle und verbesserte Trägermobilitätseigenschaften im Vergleich zu PPO-Vorrichtungen. Ein dickeres Al2 O3 Blockschicht im OPO-Prozess führt zu einer höheren Mobilität in Ge-Transistoren. Durch den Vergleich zweier unterschiedlicher Oxidationsmethoden zeigen die Ergebnisse, dass OPO ein effektiver Weg ist, um die Qualität der Grenzflächenschicht zu erhöhen, was zu einer verbesserten effektiven Mobilität von Ge-pMOSFETs beiträgt.
Hintergrund
Da sich herkömmliche komplementäre Metall-Oxid-Halbleiter-(CMOS)-Bauelemente ihrer physikalischen Grenze nähern, ist eine Leistungssteigerung für Hochgeschwindigkeits-Halbleiterbauelemente mit Silizium (Si) als Kanalmaterial schwer zu realisieren. Das Ersetzen von Substrat- oder Kanalmaterial durch anderes Material mit hoher Mobilität ist eine zwingende Option. Germanium (Ge) wurde aufgrund der höheren Ladungsträgermobilität als die von Si als vielversprechendes alternatives Kanalmaterial angesehen. Der MOSFET benötigt normalerweise eine hochwertige Oxid/Halbleiter-Schnittstelle, um eine hohe effektive Mobilität zu erreichen. Ge-MOSFETs litten jedoch lange Zeit unter der hohen Grenzflächenzustandsdichte (D es ) verursacht durch die schlechte thermische Stabilität von GeO2 und baumelnde Bindungen [1]. Daher wurde viel über die Passivierung der Ge-Grenzfläche geforscht.
Es wurden mehrere Ansätze zum Erzielen einer qualitativ hochwertigen Ge/Dielektrikum-Grenzflächenschicht berichtet, wie z. B. Si-Passivierung durch gleichförmiges Abscheiden mehrerer Si-Monoschichten auf einem Ge-Substrat vor der dielektrischen Epitaxie oder Selbstpassivierung durch Bildung von GeO2 absichtlich [2, 3]. Um ein hochwertiges GeO2 . zu bilden Schicht gibt es viele Oxidationsprozesse, um D . zu reduzieren es und Verbesserung der thermischen Stabilität, einschließlich Hochdruckoxidation [4], Ozonoxidation [5], H2 O-Plasma [6] und Elektron-Zyklotron-Resonanz-(ECR)-Plasma nach der Oxidation [7].
In den letzten Jahren wurde über zahlreiche Arbeiten berichtet, in denen ein Hochleistungs-Ge-MOSFET durch Nachoxidation durch Al2 . realisiert werden kann O3 /Ge-Schnittstelle. 2014 wurde ein Ge-CMOS-Inverter auf einem Ge-auf-Isolator-(GeOI)-Substrat mit GeOx . realisiert gezüchtet durch schnelles thermisches Glühen in reiner Sauerstoffumgebung nach 1 nm Al2 O3 wurde auf Ge abgelagert [8]. In Ref.-Nr. [7], Ge pMOSFETs und nMOSFETs mit GeOx Passivierung wurden mit Sauerstoffplasma nach Oxidation und Temperaturabhängigkeit von GeOx . hergestellt Dicke und elektrische Leistung wurden ebenfalls diskutiert. Die thermische Oxidation von Ge durch Ozon kann bei einer niedrigeren Temperatur durchgeführt werden, da Ozon reaktiver ist als Sauerstoff [5]. Der Einfluss der Temperatur auf GeOx durch Ozon auf der Ge-Oberfläche gewachsene Dicke wurde demonstriert. Ge pMOSFETs mit GeOx Passivierung durch Ozon-Nachoxidation wurde ebenfalls berichtet [9].
In dieser Arbeit werden Ge-pMOSFETs mit GeOx Passivierungen werden unter Verwendung von Ozon-Nachoxidation (OPO) und Sauerstoff-Plasma-Nachoxidation (PPO) des Al2 . hergestellt O3 /n-Ge-Schnittstelle. Es wird eine Vergleichsstudie zur elektrischen Leistung von Ge-pMOSFETs mit OPO und PPO durchgeführt. Alle Prozesse mit Ausnahme der Passivierung werden genau so gesteuert, dass sie gleich sind. Die Nachoxidation wurde nach dem Al2 . durchgeführt O3 Blockschichtabscheidung, die sich von [9] unterscheidet, bei der die Nachoxidation nach HfO2 . erfolgte Ablage. Der Mobilitätsdegenerationsmechanismus von Coulomb und Rauheitsstreuung wird untersucht. Der Einfluss der Dicke des Al2 O3 Blockschicht auf die Geräteleistung wird ebenfalls diskutiert. Insgesamt zeigen wir, dass OPO eine vielversprechende Passivierungstechnik für die zukünftige Ge-MOSFET-Herstellung ist.
Methoden
Ge-pMOSFETs wurden auf 4-in. n-Ge(001)-Wafer mit einem spezifischen Widerstand von 0,14–0,183 Ω cm. Es wurden drei verschiedene Passivierungsprozesse durchgeführt, und die wichtigsten Prozessschritte sind in Abb. 1a dargestellt. Die Wafer wurden mit verdünnter HF (1:50) und entionisiertem Wasser mehrere Zyklen lang gereinigt, um das native Oxid zu entfernen, und dann sofort in eine plasmaunterstützte Atomlagenabscheidungskammer PEALD (Picosun R200 Advanced) überführt. Dann ein dünnes Al2 O3 Film (~ 1 nm) wurde bei 300 °C mit Trimethylaluminium (TMA) und entionisiertem Wasser (H2 .) abgeschieden O) als Vorläufer von Al bzw. O. Weil die Al2 O3 /GeO2 Schicht zu dünn ist, um ein genaues Sauerstoffatomverhältnis zu haben, haben wir diese beiden Schichten als AlOx . markiert /GeOx . PPO wurde 60 s lang mit der entfernten Plasmaquelle Litmas durchgeführt. Ein Ozongenerator (IN USA AC-Serie Ozongeneratoren) mit einem Eingangssauerstofffluss von 750 sccm wurde für die OPO-Behandlung in 50 % O3 . verwendet /O2 Umgebungs. Ohne das Vakuum zu unterbrechen, 60-Zyklen HfO2 wurde dann oben auf AlOx . abgeschieden /GeOx nach PPO- oder OPO-Behandlung bei 300°C unter Verwendung von Tetrakisdimethylaminohafnium (TDMAHf) und H2 O als Vorläufer von Hf bzw. O. Als Gate-Metall wurde dann ein 100 nm TaN durch reaktives Sputtern abgeschieden. Nach der Gatestrukturierung und Ätzung, selbstjustiertes BF 2+ Implantation in Source/Drain(S/D)-Regionen mit einer Energie von 20 keV und einer Dosis von 1 × 10 15 cm − 2 wurde rausgebracht. Ein 20-nm-Ni-S/D-Metall wurde abgeschieden und durch einen Abhebeprozess strukturiert. Schließlich folgte ein schnelles thermisches Tempern bei 450°C für 30 s zur Dotierstoffaktivierung und zum ohmschen S/D-Kontakt. Die schematischen und mikroskopischen Bilder der hergestellten Ge-pMOSFETs sind in Abb. 1b bzw. c gezeigt.
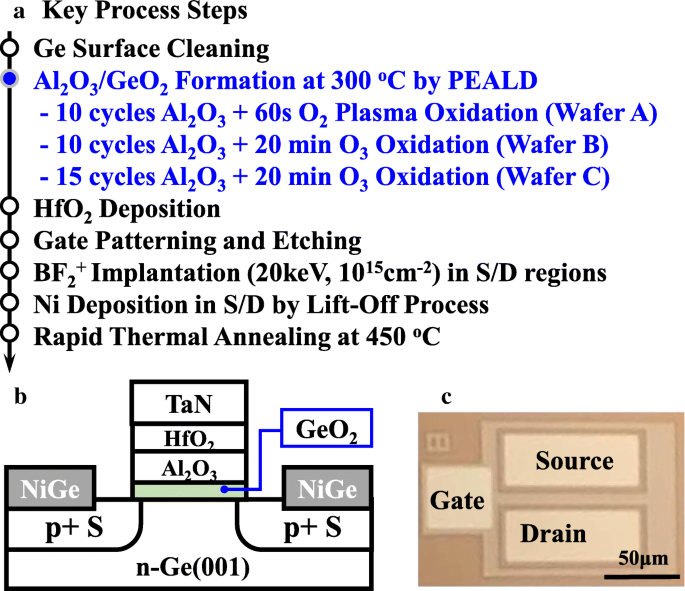
a Schlüsselprozessablauf für die Herstellung von Ge-pMOSFETs mit GeO2 Oberflächenpassivierung mit drei verschiedenen Passivierungsmethoden. b Schema und c Mikroskopaufnahmen des hergestellten Ge-Transistors
Der Querschnitt von TaN/HfO2 /AlOx /GeOx /Ge-Gate-Stack wurde mit einem Transmissionselektronenmikroskop (TEM) dargestellt, um den Einfluss von Sauerstoffplasma oder Ozon auf GeOx . zu vergleichen Formation. Abbildung 2a und b zeigen die Querschnitts-TEM-Bilder von TaN/HfO2 /AlOx /GeOx /Ge-Gate-Stack mit PPO bzw. OPO. Die Dicke des amorphen HfO2 Schicht in beiden Geräten beträgt 6 nm. Wafer A mit 60s PPO-Behandlung hat ein ausgeprägtes AlOx /GeOx Schicht zwischen HfO2 und Ge-Substrate. Dieses AlOx /GeOx Schicht in Wafer B, die durch 20 min OPO gebildet wird, weist einen unordentlichen Rand auf. Die Dicke des GeOx Schicht stimmt mit den Daten in [10] überein.
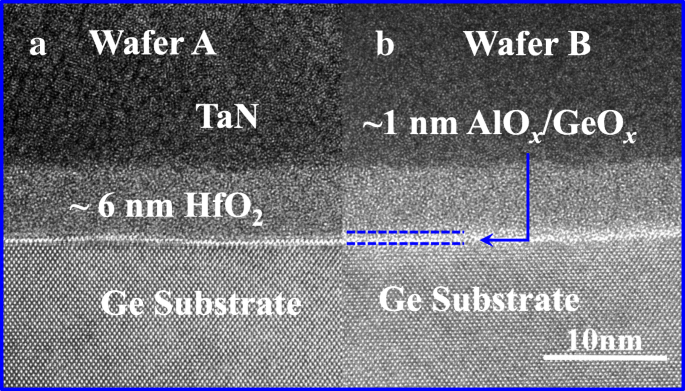
Querschnitts-TEM-Bilder des High-k/Metall-Gate-Stapels mit einem AlOx /GeOx Grenzschicht (IL) hergestellt von a OPO und b PPO auf einem n-Ge (001)-Kanal
Ergebnisse und Diskussion
Die Ausgangs- und Übertragungseigenschaften in Verbindung mit der hochfrequenten Gate-Source-Kapazitätsspannung (CV) wurden von Keithley 4200-SCS gemessen. Abbildung 3 zeigt den Vergleich der Übertragungs- und Ausgangscharakteristik von Ge-pMOSFETs mit drei verschiedenen Bildungsbedingungen des AlOx /GeOx Passivierungsschicht. Alle Geräte auf verschiedenen Wafern haben eine Gate-Länge (L G ) von 3 μm. Bauelemente auf Wafer A weisen einen höheren gesättigten Drainstrom (I DS ) im Vergleich zu den anderen beiden Wafern. Wafer B und C mit OPO zeigen jedoch einen viel geringeren Strom im AUS-Zustand (I AUS ) verglichen mit Wafer A mit PPO. Es ist auch ersichtlich, dass Wafer B und C mit OPO im Anreicherungsmodus und Wafer A im Verarmungsmodus arbeiteten. Daraus wird geschlossen, dass die n-Ge-Oberfläche nach der PPO-Behandlung aufgrund des hohen D . immer noch vom p-Typ ist es Wert, der in [11] diskutiert wurde. Wafer C mit dickerem Al2 O3 Blockschicht zeigt ein positives V TH Verschiebung gegenüber Wafer B und einem höheren D es als Wafer B. Aus den in Fig. 3b gezeigten Ausgangskennlinien ist zu erkennen, dass bei einer niedrigen Gatespannung (V GS ), Wafer A hat ein niedrigeres I DS über den Wafern B und C aufgrund des weniger steilen Subthreshold-Swings (SS). Wenn das V GS steigt, ich DS von Wafer A wird im Vergleich zu den anderen beiden Geräten höher. Daher ist aus Abb. 3 und TEM-Bildern in Abb. 2 die Diffusion des AlOx /GeOx Schicht kann das I . unterdrücken AUS , was zu einer Verbesserung der Passivierungseffekte führt.
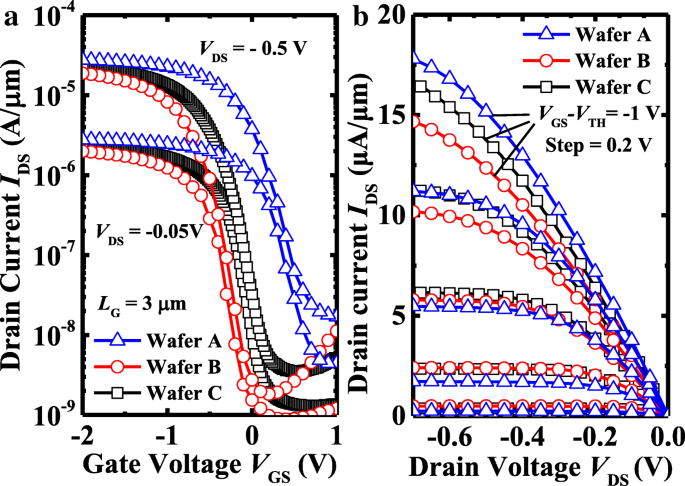
a Ich DS –V GS und b Ich DS –V DS Eigenschaften von Ge-pMOSFETs mit einem Al2 O3 /GeO2 Passivierungsschicht hergestellt aus PPO (Wafer A) und OPO (Wafer B und C)
Abbildung 4 fasst die statistischen Ergebnisse des I . zusammen EIN /Ich AUS Ratio und Subthreshold-Swing der Geräte auf verschiedenen Wafern. Ge pMOSFETs mit OPO weisen ein höheres I . auf EIN /Ich AUS Verhältnis (~ 4 Größenordnungen) und bemerkenswert verbesserter SS im Vergleich zu PPO-Geräten, was auf eine höhere Qualität der Dielektrikum/Kanal-Schnittstelle hinweist. Im Vergleich zu Wafer B weist Wafer C einen höheren EIN-Zustandsstrom (I EIN ) aber ein niedrigeres I EIN /Ich AUS Verhältnis.
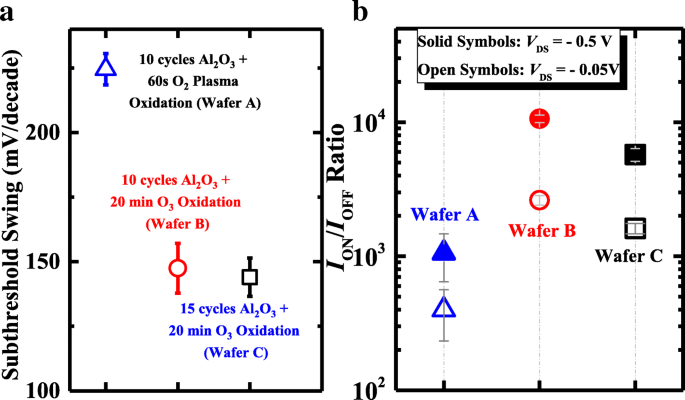
Statistische Diagramme von a SS und b Ich EIN /ich AUS Verhältnis für Ge-pMOSFETs mit unterschiedlichen Passivierungsbedingungen
Um die Grenzflächenqualität verschiedener Postoxidationsmethoden weiter darzustellen, wurden die Wafer A, B und C (Dummy-Proben ohne HfO2 und Gate-Metalle) wurden durch Röntgen-Photoelektronen-Spektroskopie (XPS) getestet. XPS-Messungen wurden an drei Dummy-Proben nach der Oxidation nach PPO- oder OPO-Behandlung ohne HfO2 . durchgeführt Abscheidung und TaN-Sputtern. Die Stöchiometrie von GeOx in Al2 O3 /GeO/Ge-Proben wurde mit einer monochromatischen weichen Al Kα-Röntgenquelle (1486,6 eV) untersucht. Ge 3d Peaks und Peak-differenzierende Analyse sind in Abb. 5 gezeigt. Das Ge 3d 5/2 Peak der drei Proben ist bei 29,7 eV vereint, und die chemischen Verschiebungen von Ge 3d 3/2 , Ge 1+ , Ge 2+ , Ge 3+ , und Ge 4+ zu Ge 3d 5/2 werden auf 0,6, 0,8, 1,8, 2,75 bzw. 3,4 eV eingestellt [12]. In Abb. 5b zeigt Wafer A, dass nach 60 s PPO die Haupt-Ge-Valenz in GeOx sind Ge 1+ und Ge 3+ . Eine ähnliche Ge-Valanzzustandsverteilung wird in Wafer C beobachtet, und ein Ge 3+ Komponente leicht erhöht. In Fig. 5b zeigt Wafer B, dass ein OPO-Bauelement mit dünnerem (10 Zyklen) Al2 O3 wird Ge 1+ . weiter oxidieren in Ge 2+ , Ge 3+ , und Ge 4+ , während Ge 1+ wird deutlich reduziert.
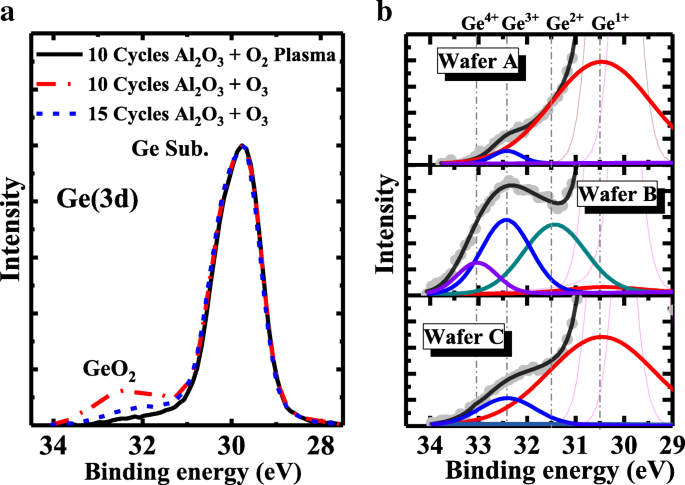
a Ge 3d XPS-Spektren von Al2 O3 /GeOx /Ge gebildet durch verschiedene Bedingungen. b Peakfittings des Ge 3d XPS-Spektren von GeO2 Schicht für die drei Proben
Die CV-Kennlinien von Gate zu Source sind in Abb. 6 dargestellt. Aus der 1-MHz-CV-Kurve wird das D es Near Midgap wird von Termans geschätzt Methode [13], und ein Wert der äquivalenten Oxiddicke (EOT) wird ebenfalls wie in Tabelle 1 aufgeführt bewertet. Zwanzig-Minuten-OPO (Wafer B und C) führt zu einer höheren EOT im Vergleich zu PPO (Wafer A). Wafer C weist aufgrund des dickeren Al2 . einen höheren EOT als Wafer B auf O3 als Sperrschicht. Es wurde berichtet, dass die Dicke von GeOx auf einer blanken Ge-Oberfläche in O3 Die Umgebungstemperatur erreicht die Sättigung in wenigen Minuten und die Sättigungsdicke wird von der Temperatur anstelle der Oxidationszeit dominiert [10]. In diesem Papier wird also die Dicke von GeOx durch Ozon-Nachoxidation ist nach wenigen Minuten gesättigt und die verbleibende Oxidationszeit dient nur dem Tempern.
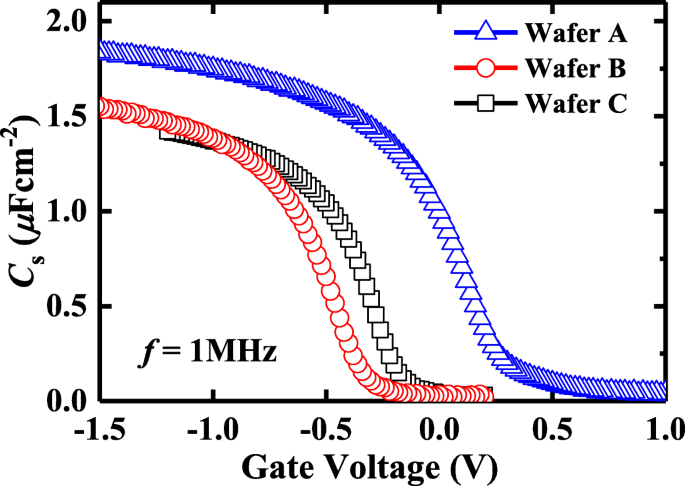
Gate-Source-Kapazität im Vergleich zu V GS Eigenschaften von Ge-pMOSFETs, die durch PPO (Wafer A) und OPO (Wafer B und C) passiviert wurden
Abbildung 7 fasst den Gesamtwiderstand (R T ) gegen L G jedes Geräts in dieser Arbeit. Hier, R T ist definiert als V DS /Ich DS bei V DS = 0,05 V und V GS − V TH = 1 V. Der Source/Drain (S/D) Serienwiderstand (R SD ) und Kanalwiderstand (R CH ) kann aus dem Achsenabschnitt und der Steigung der linearen Anpassung von R . extrahiert werden T –L G Linien wie in Abb. 7 gezeigt. Das extrahierte R SD und R CH Die Ergebnisse sind in Tabelle 1 zusammengefasst. Abbildung 7 zeigt, dass die Ge-pMOSFETs mit PPO einen niedrigeren R . aufweisen SD und R CH was mit den in Abb. 6 gezeigten Kapazitätsergebnissen übereinstimmt.
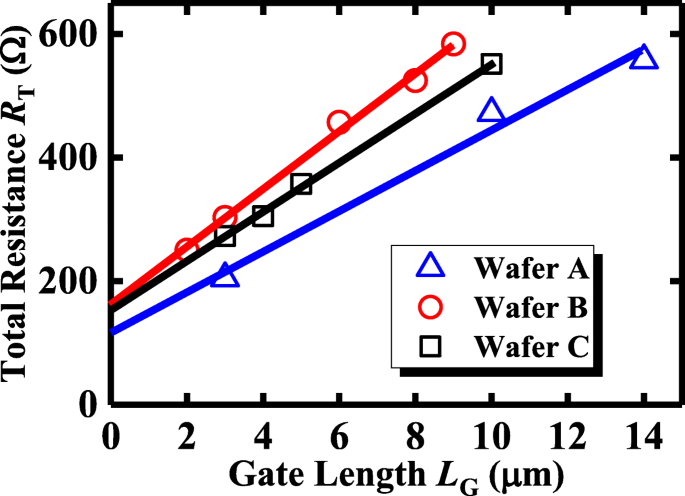
Gesamtwiderstand (R T ) versus Gate-Länge (L G ) von Ge-pMOSFETs
Effektive Lochbeweglichkeit μ eff wurde basierend auf einem auf Gesamtwiderstandssteigung basierenden Ansatz extrahiert. In Abb. 8 vergleichen wir die μ eff unserer Ge-pMOSFETs mit PPO- und OPO-Behandlung mit denen anderer berichteter Ge-pMOSFETs [9, 14]. Q inv ist die Inversionsladungsdichte im Gerätekanal. Ge pMOSFETs mit OPO weisen einen höheren Peak μ . auf eff im Vergleich zu den Geräten mit PPO. Wafer C mit dickerem Al2 O3 Blockschicht hat eine höhere Spitzenlochmobilität von 283 cm 2 /V s im Vergleich zu Wafer B mit dem dünneren Al2 O3 . Wafer A mit PPO zeigt ein niedrigeres Hochfeldloch μ eff bei den Geräten mit OPO, was auf die geringere Rauheitsstreuung zurückzuführen ist. Aber bei niedrigem Feld erreichen Transistoren auf Wafer A mit PPO einen niedrigeren μ eff als die OPO-Geräte aufgrund der höheren Coulomb-Streuung [15]. Es wurden nur wenige Arbeiten über Ge-pMOSFETs berichtet, die durch Ozonpassivierung hergestellt wurden. Hier wird ein Vergleich der wichtigsten Geräteleistung zwischen unseren Geräten und den berichteten Ge-pMOSFETs durchgeführt, die mit OPO behandelt wurden [9, 14], und die Ergebnisse sind in Tabelle 2 gezeigt. Daraus wird geschlossen, dass Wafer C in dieser Arbeit die hohe erreicht -Feld μ eff Verbesserung und höher I EIN /Ich AUS verglichen mit dem berichteten Gerät, das mit OPO behandelt wurde. Außerdem bei einem Q inv von 5 × 10 12 cm − 2 , Wafer C zeigt ein 2,37-fach höheres μ eff im Vergleich zur Si-Universalmobilität. Das Ich EIN von Wafer C ist etwas niedriger als in Ref. [9] was auf den größeren EOT zurückzuführen ist.
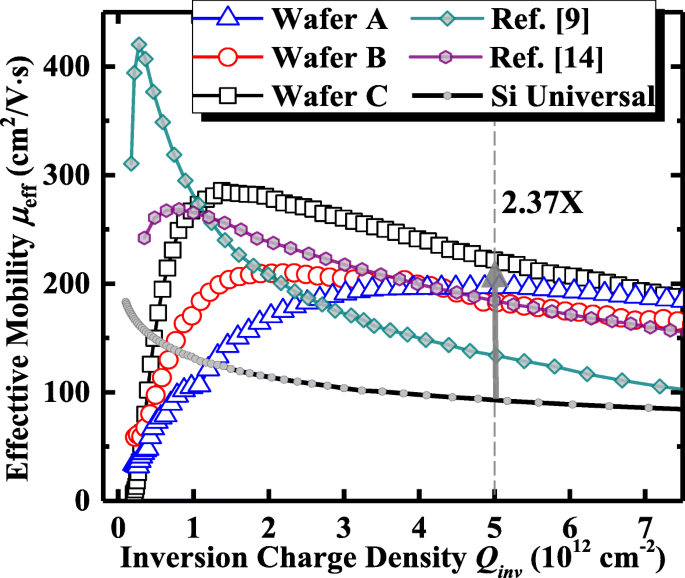
μ eff gegen Q inv von Ge-pMOSFETs mit unterschiedlichen Passivierungsbedingungen. Ge-Transistoren mit 15 Zyklen Al2 O3 + 20 min O3 Oxidation (Wafer C) zeigt einen Peak μ eff von 283 cm 2 /vs. Der Einfluss des S/D-Widerstands auf μ eff Extraktion wurde durch die auf Gesamtwiderstandssteigung basierende Methode zur Extraktion der effektiven Kanalmobilität entfernt [16]
Schlussfolgerungen
Ge-pMOSFETs werden mit GeOx . realisiert Passivierung, die durch OPO- oder PPO-Behandlung von Al2 . gebildet wird O3 /n-Ge in PEALD. Die OPO-Geräte weisen die besseren Übertragungs- und Ausgabeeigenschaften auf, je höher das I EIN /Ich AUS Verhältnis, der verbesserte unterschwellige Swing und der höhere Peak μ eff im Vergleich zu den PPO-Geräten. Für den 15-Zyklen-OPO-Prozess wird ein dickeres Al2 O3 Schicht führt zu einem höheren EOT-Wert und einem verbesserten μ eff in Geräten im Vergleich zum 10-Takt-Fall. Alle Ergebnisse dieser Arbeit weisen darauf hin, dass der OPO ein effektiver Passivierungsweg ist, um eine qualitativ hochwertige Ge/Dielektrikum-Grenzfläche zu erreichen und somit ein vielversprechender Kandidat für eine Passivierungstechnik für die zukünftige Ge-MOSFET-Herstellung sein kann.
Abkürzungen
- Al2 O3 :
-
Aluminiumoxid
- ALD:
-
Atomlagenabscheidung
- BF2 + :
-
Borfluoridion
- EOT:
-
Äquivalente Oxiddicke
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxid
- HF:
-
Flusssäure
- HfO2 :
-
Hafniumdioxid
- TEM:
-
Transmissionselektronenmikroskop
- MOSFETs:
-
Metall-Oxid-Halbleiter-Feldeffekttransistoren
- OPO:
-
Ozon-Nachoxidation
- PPO:
-
Plasma-Nachoxidation
- Q inv :
-
Inversionsladungsdichte
- SS:
-
Schwung unter der Schwelle
- XPS:
-
Röntgenphotoelektronenspektroskopie
- μ eff :
-
Effektive Lochbeweglichkeit
Nanomaterialien
- Roboter bauen mit Raspberry Pi und Python
- Führen mit Beharrlichkeit und Beharrlichkeit
- Portenta- und Thermoelement-Sensor (mit MAX6675)
- C++ Klasse und Objekt mit Beispiel
- Intelligentes Nanomaterial und Nanokomposit mit fortschrittlichen agrochemischen Aktivitäten
- Abstimmung der Oberflächenchemie von Polyetheretherketon durch Goldbeschichtung und Plasmabehandlung
- Reduzierter Kontaktwiderstand zwischen Metall und n-Ge durch Einfügen von ZnO mit Argon-Plasmabehandlung
- Ge-pMOSFETs hoher Mobilität mit amorpher Si-Passivierung:Einfluss der Oberflächenorientierung
- Was ist Plasmaschneiden und wie funktioniert Plasmaschneiden?
- Node-RED und erste Schritte mit Docker



