Verbesserung der Stromverteilung durch lokales Modulieren des Dotierungstyps in der n-AlGaN-Schicht für AlGaN-basierte tief ultraviolette Leuchtdioden
Zusammenfassung
In diesem Bericht modulieren wir den Dopingtyp lokal in der n -AlGaN-Schicht durch Vorschlagen einer n-AlGaN/p-AlGaN/n-AlGaN (NPN-AlGaN)-strukturierten Stromaufweitungsschicht für AlGaN-basierte lichtemittierende Dioden im tiefen Ultraviolett (DUV-LEDs). Nach dem Einfügen einer dünnen p-AlGaN-Schicht in die n-AlGaN-Elektronenlieferantenschicht kann im n . eine Leitungsbandbarriere erzeugt werden -Elektronenlieferantenschicht, die die Modulation der lateralen Stromverteilung in der p-Lochlieferantenschicht für DUV-LEDs ermöglicht. Darüber hinaus hat sich nach unseren Untersuchungen herausgestellt, dass die Mg-Dotierungskonzentration, die Dicke, die AlN-Zusammensetzung für die p-AlGaN-Einfügungsschicht und die Anzahl der NPN-AlGaN-Übergänge einen großen Einfluss auf den Stromverteilungseffekt haben. Eine richtig entworfene NPN-AlGaN-Stromverteilungsschicht kann die optische Ausgangsleistung, die externe Quanteneffizienz (EQE) und die Wandsteckereffizienz (WPE) für DUV-LEDs verbessern.
Einführung
Aufgrund verschiedener Anwendungen wie Desinfektion, Wasserreinigung, medizinische Behandlung und hochdichte optische Aufzeichnung [1,2,3,4,5,6,7,8] wurden intensive Anstrengungen in die Entwicklung von hocheffizientem AlGaN- basierend auf tief-ultravioletten Leuchtdioden (DUV-LEDs). In der gegenwärtigen Phase wurden bemerkenswerte Fortschritte bei der Verbesserung der kristallinen Qualität von Al-reichen AlGaN-Schichten erzielt, z die Versetzungsdichte [9], die eine interne Quanteneffizienz (IQE) von 80 % anzeigt [10]. Es ist erwähnenswert, dass ein solcher IQE unter Verwendung der Niedertemperatur-Photolumineszenz-Methode gemessen wird, bei der keine Trägerinjektion beteiligt ist. DUV-LEDs werden jedoch durch eine elektrische Vorspannung betrieben, die mit Stromfluss und Ladungsträgertransport verbunden ist [11,12,13]. Ein weiterer sehr wichtiger Aspekt in Bezug auf den Stromfluss ist der Stromverdrängungseffekt, der leicht auftritt, wenn das Gerät mit einem sehr hohen Strompegel vorgespannt wird [14]. DUV-LEDs haben eine sehr schlechte Mg-Dotierungseffizienz in der p-AlGaN-Schicht mit hohem AlN-Anteil [15, 16], was zu einer geringen elektrischen Leitfähigkeit führt. Darüber hinaus übernehmen DUV-LEDs die Flip-Chip-Strukturen, die das laterale Injektionsschema für den Strom aufweisen. Daher werden AlGaN-basierte DUV-LEDs im Vergleich zu InGaN/GaN-basierten UV-, blauen und grünen LEDs stärker durch den aktuellen Crowding-Effekt herausgefordert [17]. Das Auftreten des Stromverdrängungseffekts entweder an der p-Kontaktelektrode oder an der Mesakante führt zu einer ungleichmäßigen Elektrolumineszenzintensität in den multiplen Quantentrogs (MQWs) und einer erhöhten Sperrschichttemperatur [18]. Daher ist es in der Tat entscheidend, die laterale Stromausbreitung für DUV-LEDs zu fördern. Zu diesem Zweck ermöglicht die vorgeschlagene Narrow-Multiple-Strip-Elektrode vom p-Typ eine gleichmäßig verteilte Stromspreizung und erhöht damit den Wandstecker-Wirkungsgrad (WPE) um 60 % [19]. Darüber hinaus kann die Stromaufweitungsschicht aus ITO/ZGO (ZnGaO) den Strom besser verteilen und die externe Quanteneffizienz (EQE) verbessern, aber der erhöhte spezifische Grenzflächenwiderstand an den ZGO/p-GaN-Grenzflächen macht das WPE für DUV-LEDs weniger verbessert [20] .
Daher wird in der aktuellen Phase die Aufmerksamkeit der Forschung auf die p-Seite gelegt, um die Stromausbreitung für DUV-LEDs zu erleichtern. In dieser Arbeit schlagen wir im Gegensatz zu anderen Ansätzen vor und beweisen, dass die verbesserte Stromverteilung in der p-Typ-Lochlieferantenschicht für DUV-LEDs durch das Engineering der n-AlGaN-Elektronenlieferantenschicht erreicht werden kann. Die Energiebarriere wird im Leitungsband durch Modulieren des Dotierungstyps in der Elektronenlieferantenschicht erzeugt, d. h. die n-AlGaN/p-AlGaN/n-AlGaN (NPN-AlGaN)-Struktur wird vorgeschlagen und parametrisch untersucht. Unsere Ergebnisse zeigen, dass die laterale Verteilung der Löcher durch die Verwendung des NPN-AlGaN-Übergangs homogenisiert werden kann, wodurch die optische Ausgangsleistung, die externe Quanteneffizienz und die Wandsteckereffizienz für DUV-LEDs verbessert werden. Ein weiterer Vorteil unseres Designs besteht darin, dass im Hinblick auf das epitaktische Wachstum die Stromaufweitungsschicht in der n-Typ-Elektronenlieferantenschicht den Epi-Züchtern mehr Freiheit bei der Optimierung der Wachstumsbedingungen ermöglicht.
Forschungsmethoden und Physikmodelle
Die NPN-AlGaN-DUV-LED-Strukturen sind in Fig. 1a schematisch dargestellt. In jeder untersuchten DUV-LED haben wir ein 4 µm dickes n-Al0,60 Ga0,40 N/p-Alx Ga1−x N/n-Al0,60 Ga0,40 N-Schicht und die Si-Dotierungskonzentration des n-Al0,60 Ga0,40 N-Region ist 5 × 10 18 cm −3 . Dann fünf Paare Al0,45 Ga0,55 N/Al0,56 Ga0.44 N aktive Schichten mit mehreren Quantenmulden (MQW) werden entworfen, für die die Dicken der Quantentöpfe und der Quantenbarrieren 3 nm bzw. 12 nm betragen. Die MQWs sind mit einem 18 nm dicken Mg-dotierten p-Al0,60 . bedeckt Ga0,40 N-Schicht, die als p-EBL dient, gefolgt von einem 50 nm dicken Mg-dotierten p-Al0,40 Ga0.60 Es folgen eine N-Schicht und eine 50 nm dicke Mg-dotierte p-GaN-Schicht. Die Lochkonzentration für die p-EBL- und die Lochlieferantenschichten wird auf 3 × 10 17 . eingestellt cm −3 . Wir entwerfen die Gerätegeometrie mit einer rechteckigen Mesa von 350 × 350 μm 2 . Abbildung 1b zeigt die schematischen Leitungsbandprofile, wenn zwei NPN-AlGaN-Übergänge (dh NPNPN-AlGaN-Struktur) in der DUV-LED-Struktur verwendet werden, und wir können die Energiebarrieren sehen, die im verarmten p-Al . vorhanden sind x Ga1−x N Regionen. Die Energiebarrieren können die horizontale Stromverteilung in der Lochlieferantenschicht vom p-Typ anpassen. Beachten Sie, dass es sehr wichtig ist, dass die p-AGaN-Einfügungsschicht vollständig verarmt ist, damit sich der NPN-AlGaN-Übergang in einem Durchschlagsmodus befindet, um den Stromfluss durch den in Sperrrichtung vorgespannten n-AlGaN/p-AlGaN-Übergang zu gewährleisten [21]. Detaillierte Analysen und Diskussionen werden anschließend präsentiert. Unsere Referenz-DUV-LED ist identisch mit den NPN-AlGaN-DUV-LEDs, außer dass das 4 µm dicke Si-dotierte n-Al0,60 Ga0,40 Die N-Schicht wird als Elektronenlieferschicht verwendet.
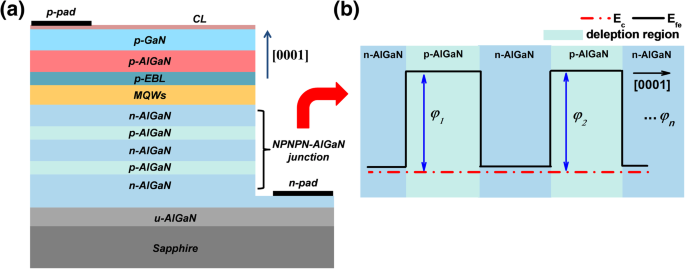
a Schematische Strukturen für die NPN-AlGaN-LED. b Schematisches Leitungsbandprofil für die NPNPN-AlGaN-Struktur mit zwei NPN-AlGaN-Übergängen; wir definieren die Barrierehöhen für jeden NPN-AlGaN-Übergang als φ 1 , φ 2 , und φ n , und n ist die Anzahl der NPN-AlGaN-Übergänge
Um den physikalischen Mechanismus für den verbesserten Stromaufweitungseffekt, der durch den NPN-AlGaN-Übergang ermöglicht wird, besser zu verstehen, ist in 2a ein Ersatzschaltbild für die DUV-LED mit einem lateralen Strominjektionsschema gezeigt. Wir können sehen, dass der Strom sowohl in vertikaler als auch in lateraler Richtung von der Lochlieferantenschicht vom p-Typ zum n-AlGaN-Gebiet fließt. Wenn der elektrische Widerstand für die n-AlGaN-Elektronenlieferschicht kleiner ist als der für die Stromaufweitungsschicht (CL), neigt der Strom dazu, sich im Bereich unter dem ohmschen Kontakt vom p-Typ zu drängen, dh I 1> Ich 2> Ich 3> …> Ich n [14]. Der Einbau von NPN-AlGaN-Übergängen in die DUV-LED-Struktur kann den destruktiven Stromverdrängungseffekt unterdrücken. Dann vereinfachen wir die Stromflusspfade für die NPN-AlGaN-DUV-LED in Abb. 2b weiter, sodass der Gesamtstrom in einen vertikalen Anteil (I 1 ) und ein horizontaler Teil (I 2 ) von Punkt A auf B zeigen . Daher wird die Gesamtspannung zwischen den beiden Punkten von der Stromaufweitungsschicht, der p-GaN-Schicht, der p-AlGaN-Schicht, den MQWs, den NPN-AlGaN-Übergängen und der n-AlGaN-Schicht geteilt. Basierend auf den aktuellen Pfaden von I 1 und ich 2 , Gl. 1 bzw. 2 erhalten, und durch Lösen der beiden vorherigen Formeln, Gl. 3 wird dann abgeleitet:
$$ {I}_1{R}_{\mathrm{CL}-\mathrm{V}}+{I}_1{R}_X+{I}_1\bullet N\bullet {R}_{npn}+{ I}_1\left({R}_{n-\mathrm{V}}+{R}_{nL}\right)={U}_{\mathrm{AB}}, $$ (1) $$ {I}_2\left({R}_{\textrm{CL}-\textrm{L}}+{R}_{\textrm{CL}-\textrm{V}}\right)+{I}_2 {R}_X+{I}_2\Kugel N\Kugel {R}_{npn}+{I}_2{R}_{n-\mathrm{V}}={U}_{\mathrm{AB}} , $$ (2) $$ \frac{I_1}{I_2}=1+\frac{R_{\mathrm{CL}-\mathrm{L}}-{R}_{n-\mathrm{L}} }{R_{\mathrm{CL}-\mathrm{V}}+{R}_X+{R}_n+N\bullet {R}_{npn}} $$ (3)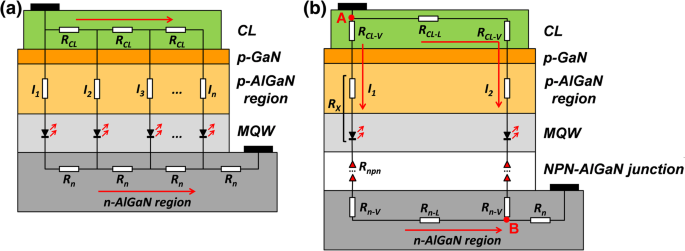
a DUV-LEDs mit lateralem Strominjektionsschema Ersatzschaltbild (I 1> Ich 2> Ich 3> ……> Ich n ). b NPN-AlGaN-strukturierte DUV-LED vereinfachtes Ersatzschaltbild und Strompfade I 1 und ich 2 werden ausgestellt
wo R CL−V und R CL−L sind die vertikalen bzw. horizontalen Widerstände für die Stromausbreitungsschicht; R n −V und R n −L bezeichnen die vertikalen bzw. horizontalen Widerstände für die n-AlGaN-Schicht; R n ist die Summe von R n −V und R n −L (d. h. R n =R n −V + R n −L ) für den aktuellen Pfad I 1; die Summation des Widerstands für den Lochinjektionsbereich vom p-Typ und den MQW-Bereich wird durch R . dargestellt x ; R npn der durch die Barrierenhöhe in jedem NPN-AlGaN-Übergang induzierte Grenzflächenwiderstand ist; N bedeutet die Gesamtzahl für den NPN-AlGaN-Übergang und den gesamten Spannungsabfall zwischen den Punkten A und B wird beschrieben von U AB . Es ist erwähnenswert, dass die 200 nm dicke Stromaufweitungsschicht für alle untersuchten Vorrichtungen viel dünner ist als die 4 µm dicke n-AlGaN-Elektronenlieferantenschicht. Daher wird ein CL erhalten, dessen elektrischer Widerstand viel größer ist als der für die n-AlGaN-Schicht, d. h. R CL−L − R n −L ≫ 0. Es ist offensichtlich, dass das Verhältnis von I 1 /Ich 2 kann durch N . reduziert werden × R npn Wertsteigerung. Daher kann der Stromaufweitungseffekt in der Lochlieferantenschicht vom p-Typ verbessert werden, indem der NPN-AlGaN-Übergang in der Elektronenlieferantenschicht vom n-Typ für DUV-LED-Strukturen verwendet wird. Einerseits die N × R npn Wert kann durch Erhöhen von N . erhöht werden . Andererseits ist der Wert von R npn wird durch die AlN-Komponente, die Dicke und die Mg-Dotierungskonzentration für die p-AlGaN-Einfügungsschicht beeinflusst. Daher wird in den anschließenden Gesprächen eine detaillierte Analyse durchgeführt.
Der Crosslight-APSYS-Simulator wird verwendet, um die Gerätephysik zu untersuchen, und die von uns verwendeten Modelle sind gemäß unseren früheren Veröffentlichungen zu blauen, UVA- und DUV-Nitrid-basierten LEDs zuverlässig [22,23,24]. In unseren physikalischen Modellen wird das Energieband-Offset-Verhältnis für den AlGaN/AlGaN-Heteroübergang auf 50:50 festgelegt [25]. Der Auger-Rekombinationskoeffizient, die Shockley-Read-Hall (SRH)-Rekombinationslebensdauer und die Lichtextraktionseffizienz werden auf 1,0 × 10 –30 . eingestellt cm 6 /s [26], 10 ns [27] bzw. ~ 8% [28] für DUV-LEDs. Die polarisationsinduzierten Grenzflächenladungen an der gitterfehlangepassten Grenzfläche werden unter Annahme eines Polarisationsniveaus von 40 % berücksichtigt [29].
Ergebnisse und Diskussionen
Einfluss der NPN-AlGaN-Struktur auf den Stromverteilungseffekt für DUV-LEDs
LED A (dh die DUV-Referenz-LED ohne NPN-AlGaN-Übergang) und LED B (dh die DUV-LED mit NPN-AlGaN-Übergang) wurden zuerst untersucht, um den Einfluss der NPN-AlGaN-Struktur auf die Homogenisierung des Stroms für die p-Typ-Lochlieferant-Schicht. Jeder NPN-AlGaN-Übergang hat ein 20 nm dickes p-Al0,60 Ga0,40 N-Einfügungsschicht, für die die Mg-Dotierungskonzentration 1 × 10 18 . beträgt cm −3 . Abbildung 3a zeigt das Energiebandprofil bei einer Stromdichte von 170 A/cm 2 für LED B. Zwei Energiebarrieren im Leitungsband werden in den NPN-AlGaN-Übergängen gebildet, und die Bildung der Energiebarriere wird gut auf den Verarmungseffekt des eingefügten p-Al0.60 . zurückgeführt Ga0,40 N-Schicht. Die erzeugten Barrieren in LED B induzieren den Grenzflächenwiderstand von R npn in der NPN-AlGaN-Übergangsregion, was zur Verringerung von I . beiträgt 1 /Ich 2 wie in Gl. 3, sodass mehr Löcher entlang des Strompfads fließen I 2 . Wir berechnen und zeigen dann die horizontale Lochkonzentration im letzten Quantentopf (LQW) für die LEDs A und B bei einer Stromdichte von 170 A/cm 2 , wie in Abb. 3b dargestellt. Wir können deutlich sehen, dass LED B im Vergleich zu LED A eine bessere laterale Stromausbreitung erzielt. Somit beweisen wir, dass das NPN-AlGaN in der n-Typ-Elektronenlieferanten-Schicht den Stromstreuungseffekt in der p-Typ-Lochlieferant-Schicht erleichtert für DUV-LEDs.

a Energiebandprofil für LED B, in dem wir das Leitungsband, Quasi-Fermi-Niveaus für Elektronen und Löcher und das Valenzband als E . definieren c , E wie , E fh , und E v , bzw. b Horizontale Lochkonzentration im LQW für LEDs A und B bei einer Stromdichte von 170 A/cm 2
Neben der Darstellung der lateralen Lochkonzentration zeigen wir auch die Lochkonzentrationsniveaus in den MQWs für LEDs A und B in Abb. 4a. Wir können sehen, dass aufgrund des verbesserten Stromverteilungseffekts die Lochkonzentration in den MQWs für LED B im Vergleich zu LED A erhöht ist. Die erhöhte Lochkonzentration in den MQWs begünstigt die Strahlungsrekombination für LED B (siehe Abb. 4b).
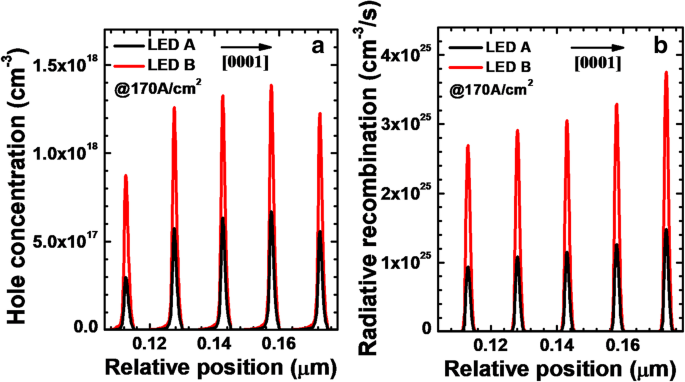
a Lochkonzentrationsniveaus und b Strahlungsrekombinationsprofile in den MQWs für LEDs A bzw. B. Wir sammeln die Daten an einer Stelle, die 120 μm vom rechten Rand der Mesa entfernt ist, wenn die Stromdichte 170 A/cm beträgt 2
Der Einfluss des NPN-AlGaN-Übergangs wird auch durch die berechneten optischen und elektrischen Leistungen für die LEDs A und B gerechtfertigt, wie in Abb. 5 gezeigt. Abbildung 5a zeigt den EQE und die optische Leistungsdichte als Funktion des eingespeisten Stroms für beide LEDs A und B. Wir können sehen, dass LED B dank des verbesserten Stromverteilungseffekts und der Lochinjektionseffizienz, die durch den NPN-AlGaN-Übergang ermöglicht werden, sowohl einen höheren EQE als auch eine höhere optische Leistungsdichte als LED A aufweist. Beispielsweise beträgt die Verbesserung der optischen Leistungsdichte für LED B ~ 1,67 %, wenn die Stromdichte 170 A/cm 2 . beträgt nach Abb. 5a. Untersuchungen in Abb. 5b zeigen, dass die Durchlassspannung für LED B mit NPN-AlGaN-Übergang im Vergleich zu LED A leicht ansteigt. Wir führen dieses Phänomen auf die Energiebarrieren in den Verarmungsgebieten zurück, die durch das NPN-AlGaN . verursacht werden Kreuzungen. Glücklicherweise hat die höhere Durchlassspannung von LED B keinen nachteiligen Einfluss auf die Steckdoseneffizienz (WPE), und der WPE für LED B übersteigt den für LED A, wenn die Injektionsstromdichte größer als ~ 56 A/cm2 wie in Abb. 5c gezeigt. Wir glauben, dass sowohl verbesserte EQE als auch WPE realisiert werden können, sobald der NPN-AlGaN-Übergang optimiert werden kann, was wie folgt vollständig untersucht wird.
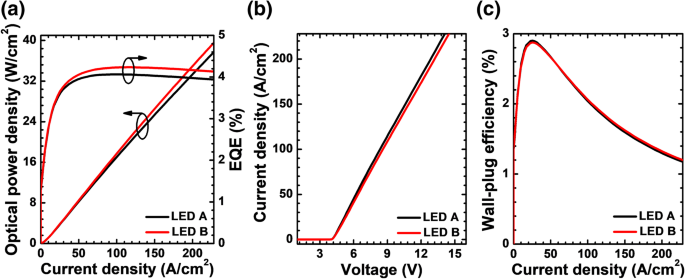
a EQE und optische Leistungsdichte in Bezug auf den Injektionsstrom, b Strom-Spannungs-Kennlinie und c WPE in Abhängigkeit vom Injektionsstrom für LEDs A und B
Einfluss der AlN-Zusammensetzung für die p-AlGaN-Schicht auf den Stromausbreitungseffekt
In diesem Abschnitt wird der Einfluss der AlN-Zusammensetzung für den NPN-AlGaN-Übergang auf die optischen und elektrischen Eigenschaften von DUV-LEDs untersucht. Um diesen Mechanismus anschaulich zu veranschaulichen, verwenden wir fünf DUV-LEDs, d. h. LEDs Ci (ich =1, 2, 3, 4 und 5) mit unterschiedlichem NPN-Alx Ga1−x N-Übergänge, für die die AlN-Zusammensetzungen für p-Alx Ga1−x N Einfügungsschichten sind 0,60, 0,63, 0,66, 0,69 bzw. 0,72. Die Dotierungskonzentration und -dicke für das p-Alx Ga1−x N-Layer sind 1,8 × 10 18 cm −3 bzw. 20 nm. Zwei NPN-AlGaN-Übergänge, d. h. NPNPN-AlGaN-Übergänge, werden für alle untersuchten Geräte verwendet. Wir berechnen dann die Höhe der Leitungsbandbarriere für jedes NPN-Alx Ga1−x N-Übergang für LEDs Ci (ich =1, 2, 3, 4 und 5), wie in Tabelle 1 gezeigt. Es ist deutlich zu sehen, dass der Wert der Leitungsbarrierehöhe mit der AlN-Zusammensetzung für p-Alx Ga1−x N Einfügungsschicht erhöht. Eine hohe Leitungsbarrierehöhe kann den Wert von R . erhöhen npn Anstieg und ein verringertes Verhältnis von I 1 /Ich 2 gleichzeitig ausgelöst wird, wie in Gl. 3. Um diesen Punkt zu beweisen, die lateralen Lochverteilungen im letzten Quantentopf für alle untersuchten Geräte bei einer Stromdichte von 170 A/cm 2 berechnet und in Abb. 6a dargestellt. Bei LED C1 kann die Lochverteilung nach dem NPN-Al0,60 . moduliert werden Ga0,40 Es wird eine N-Struktur verwendet, und es ist offensichtlich, dass der Stromverteilungseffekt eine weitere Verbesserung erhält, sobald die AlN-Komponente der p-AlGaN-Einfügungsschicht für unsere Strukturen auf 0,63 ansteigt.
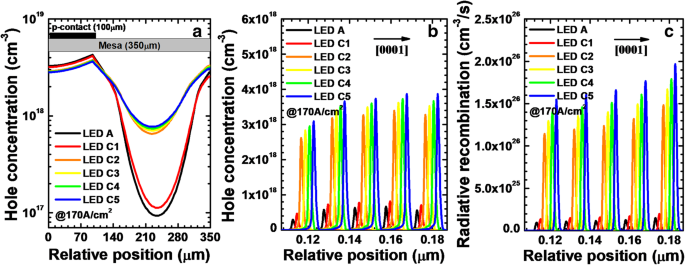
a Horizontale Lochkonzentration im LQW, b Lochkonzentrationsniveaus und c Strahlungsrekombinationsprofile in den MQWs für LEDs A und Di (ich =1, 2, 3, 4 und 5) bei einer Stromdichte von 170 A/cm 2 . Wir verschieben absichtlich die Kurven für b und c um 2 nm zur leichteren Identifizierung
Wir demonstrieren die simulierten Lochkonzentrationsniveaus und Strahlungsrekombinationsprofile in den MQWs für LEDs A und Ci (ich =1, 2, 3, 4 und 5) in Fig. 6b und c, wenn die Stromdichte 170 A/cm 2 . beträgt , bzw. Die Lochkonzentrationsniveaus und Strahlungsrekombinationsprofile werden an einer Stelle in 120 µm Entfernung vom rechten Rand der Mesa gesammelt. Wir verschieben die Lochkonzentrationsniveaus und Strahlungsrekombinationsprofile in Abb. 6b und c für die untersuchten DUV-LEDs räumlich um 2 nm zur leichteren Identifizierung. Die niedrigste Lochkonzentration in den MQWs wird deutlich für LED A beobachtet und somit ist auch die niedrigste strahlende Rekombination in Abb. 6c gezeigt. Die Lochkonzentration und die Strahlungsrekombination in den MQWs nehmen aufgrund der Verwendung des NPN-AlGaN-Übergangs zu und können mit der Zunahme der AlN-Zusammensetzung in der p-AlGaN-Einfügungsschicht noch weiter erhöht werden.
Die optische Leistungsdichte und EQE als Funktion der Injektionsstromdichte werden weiter berechnet und für die untersuchten LEDs in 7a dargestellt. Wie in der Abbildung gezeigt, nehmen EQE und optische Leistungsdichte zu, sobald der NPN-AlGaN-Übergang verwendet wird. Darüber hinaus können die EQE und die optische Leistungsdichte weiter gefördert werden, wenn die AlN-Zusammensetzung für die p-AlGaN-Einfügungsschicht zunimmt. Wir tragen dies zur homogeneren lateralen Lochverteilung in den MQWs bei, wie in Abb. 6a gezeigt. Die Strom-Spannungs-Kennlinien der LEDs A und Ci (ich =1, 2, 3, 4 und 5) sind in Abb. 7b dargestellt. Die Durchlassspannung für LED C1 zeigt einen kleinen Anstieg im Vergleich zu LED A und LED C5 zeigt die größte Durchlassspannung. Die nebenstehende Abbildung zeigt die Durchlassspannung für alle untersuchten LEDs bei einer Stromdichte von 170 A/cm 2 . Es ist bemerkenswert, dass die Durchlassspannung für die LEDs C2, C3 und C4 im Vergleich zu LED A abnimmt. Obwohl der NPN-AlGaN-Übergang den vertikalen Widerstand für DUV-LEDs erhöht, verbessert die gleichmäßigere Ladungsträgerkonzentration entlang der horizontalen Richtung die horizontale Leitfähigkeit. was zu einer verringerten Durchlassspannung führt. Dies deutet darauf hin, dass der verstärkte Stromaufweitungseffekt dazu beitragen kann, die Durchlassspannung für DUV-LEDs zu reduzieren, solange die Stromaufweitungsschicht richtig ausgelegt ist [30]. Unser Design moduliert jedoch den Strompfad durch das Induzieren von Barrieren, und daher kann eine zu hohe Barrierenhöhe die elektrische Leitfähigkeit beeinträchtigen [21], z. B. LED C5.
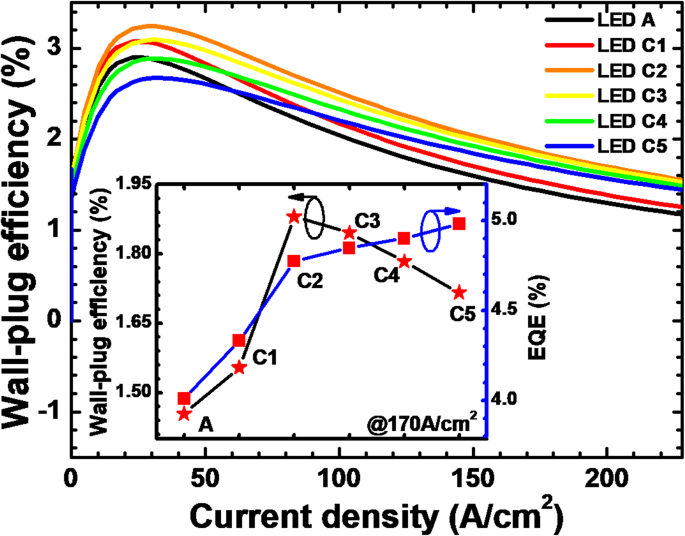
a EQE und optische Leistungsdichte in Bezug auf den Injektionsstrom und b Strom-Spannungs-Kennlinie für LEDs A und Ci (ich =1, 2, 3, 4 und 5). Einschub:die Durchlassspannungen für LEDs A und Ci (ich =1, 2, 3, 4 und 5) bei einer Stromdichte von 170 A/cm 2
Die WPE als Funktion der Injektionsstromdichte für alle untersuchten Vorrichtungen ist in 8 dargestellt. Im Vergleich zu LED A steigt die WPE der LED C1 an, sobald der NPN-AlGaN-Übergang verwendet wird. WPE für LEDs Ci (ich =2, 3, 4 und 5) kann weiter verbessert werden, wenn die AlN-Zusammensetzung der p-AlGaN-Schicht für den NPN-AlGaN-Übergang zunimmt. Allerdings zeigt LED C2 trotz der relativ geringen optischen Leistungsdichte unter den LEDs Ci . den höchsten WPE aufgrund der niedrigsten Durchlassspannung (ich =2, 3, 4 und 5). Außerdem zeigen wir WPE und EQE bei der Injektionsstromdichte von 170 A/cm 2 für alle untersuchten Geräte in der Nebenabbildung. Es ist bekannt, dass der Stromverdrängungseffekt bei einer hohen Injektionsstromdichte schwerwiegend ist. Der NPN-AlGaN-Übergang für LED C5 spielt am besten bei der Homogenisierung des Stroms. Die WPE ist jedoch nicht zufriedenstellend, wenn die Durchlassbetriebsspannung signifikant ansteigt. Daher muss der Wert der AlN-Komponente der p-AlGaN-Einfügungsschicht für den NPN-AlGaN-Übergang vollständig optimiert werden, bevor die Verbesserung sowohl für EQE als auch für WPE erreicht werden kann.
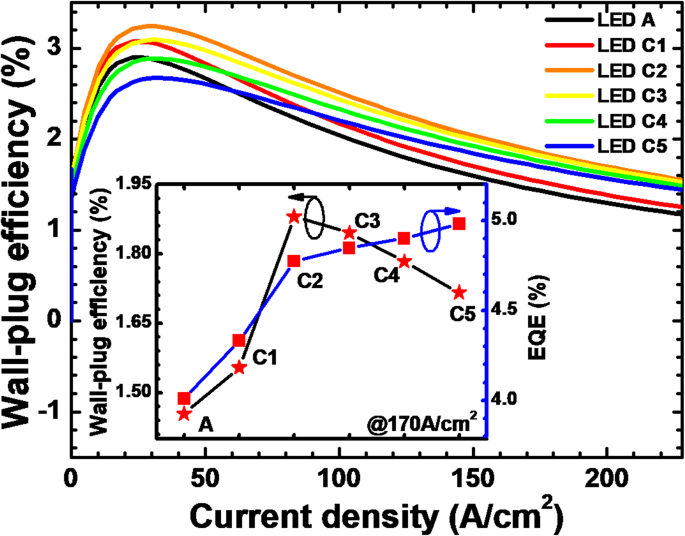
Beziehung zwischen WPE und dem Injektionsstrom für LEDs A und Ci (ich =1, 2, 3, 4 und 5). Einschub:EQE und WPE für die untersuchten LEDs strukturiert mit einer p-AlGaN-Schicht mit verschiedenen AlN-Komponenten bei einer Stromdichte von 170 A/cm 2
Einfluss der Mg-Dotierungskonzentration für die p-AlGaN-Schicht auf den Stromausbreitungseffekt
Die Breite des Verarmungsbereichs für den NPN-AlGaN-Übergang kann durch Variieren der Mg-Dotierungskonzentration für die p-AlGaN-Einfügungsschicht gesteuert werden, und die Höhe der Leitungsbandbarriere ändert sich ebenfalls entsprechend. Somit ist der Wert von R npn kann erhöht werden, sobald der Verarmungsbereich für den NPN-AlGaN-Übergang breit wird und der Wert von I 1 /Ich 2 reduziert, d. h. die Stromspreizwirkung für DUV-LEDs kann verbessert werden. Zur besseren Verdeutlichung wurden fünf DUV-LEDs mit unterschiedlichen Mg-Dotierungskonzentrationen für die p-AlGaN-Einfügungsschicht im NPN-AlGaN-Übergang entworfen und untersucht. Wir setzen die Mg-Dotierungskonzentrationen für die p-AlGaN-Schicht auf 3 × 10
17
, 7,5 × 10
17
, 1,7 × 10
18
, 2 × 10
18
, und 3 × 10
18
cm
−3
für LEDs Di (ich =1, 2, 3, 4 bzw. 5). Die Dicke und die AlN-Zusammensetzung für die p-AlGaN-Einfügungsschicht betragen 20 nm bzw. 0,61. Wir verwenden zwei NPN-AlGaN-Übergänge. Wie in Tabelle 2 gezeigt, nimmt die Höhe der Leitungsbandbarriere zu, wenn die Mg-Dotierungskonzentration für die p-AlGaN-Schicht zunimmt. Dann berechnen und zeigen wir die laterale Lochkonzentration im letzten Quantentopf, wenn die Stromdichte 170 A/cm
2
. beträgt in Fig. 9a, und es ist offensichtlich, dass verglichen mit der seitlichen Lochverteilung für LED A die seitliche Lochverteilung gleichförmiger wird, wenn der NPN-AlGaN-Übergang für DUV-LEDs eingeführt wird. Darüber hinaus kann eine noch homogenere Lochverteilung erhalten werden, sobald die Mg-Dotierungskonzentration für die p-AlGaN-Schicht im NPN-AlGaN-Übergang ansteigt 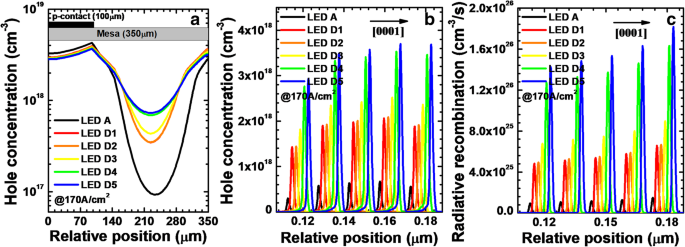
a Horizontale Lochkonzentration im LQW, b Lochkonzentrationsniveaus und c Strahlungsrekombinationsprofile in den MQWs für LEDs A und Di (ich =1, 2, 3, 4 und 5) bei einer Stromdichte von 170 A/cm 2 . Wir verschieben absichtlich die Kurven für b und c um 2 nm zur leichteren Identifizierung
Dann werden die berechneten Lochkonzentrationsniveaus und Strahlungsrekombinationsprofile in den MQWs für alle untersuchten LEDs in Fig. 9b und c demonstriert, wenn die Stromdichte 170 A/cm 2 . beträgt , und der Ort, an dem die Daten gesammelt werden, ist 120 µm von der rechten Mesakante entfernt. Wie erwartet, LEDs Di (ich =1, 2, 3, 4 und 5) weisen im Vergleich zu LED A die höheren Lochkonzentrationsniveaus und Strahlungsrekombinationsprofile in den MQWs auf, während die Lochkonzentration und Strahlungsrekombination mit steigenden Mg-Dotierungskonzentrationen in der p-AlGaN-Schicht zunehmen für die LEDs mit NPN-AlGaN-Übergängen. Wir tragen zur steigenden Lochkonzentration in den MQWs für LEDs bei Di (ich =1, 2, 3, 4 und 5) auf den verstärkten Stromstreueffekt.
Aufgrund des reduzierten Stromverdrängungseffekts und der steigenden Lochkonzentration in den MQWs werden LEDs Di (ich =1, 2, 3, 4 und 5) zeigen dementsprechend die geförderte EQE und die optische Leistungsdichte (siehe in Fig. 10a). Die Strom-Spannungs-Kennlinien für LEDs A und Di (ich =1, 2, 3, 4 und 5) sind in Abb. 10b dargestellt. Anscheinend sind die Vorwärtsbetriebsspannungen für LEDs Di (ich =1, 2, 3, 4 und 5) steigen mit zunehmender Mg-Dotierungskonzentration für die p-AlGaN-Einfügungsschicht. Unter diesen zeigt LED D5 die größte Einschaltspannung, und dies wird der parasitären Diode zugeschrieben, die durch die sehr hohe Mg-Dotierungskonzentration in der p-AlGaN-Schicht verursacht wird. Gemäß der Nebenfigur von 10b ist auch zu sehen, dass LED D5 die größte Vorwärtsbetriebsspannung unter allen untersuchten LEDs zeigt, wenn die Injektionsstromdichte 170 A/cm2 beträgt .
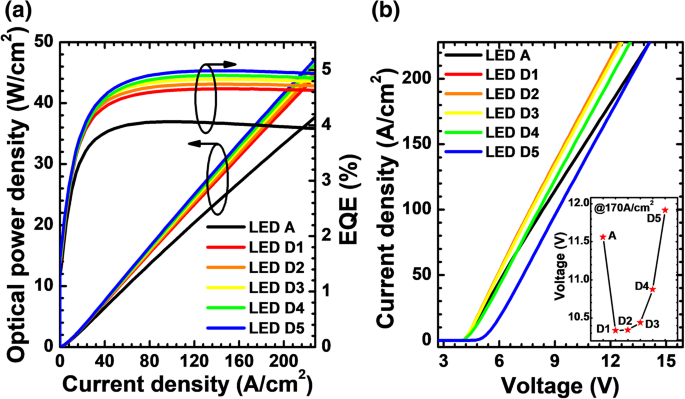
a EQE und optische Leistungsdichte in Bezug auf den Injektionsstrom und b Strom-Spannungs-Kennlinie für LEDs A und Di (ich =1, 2, 3, 4 und 5). Einschub:die Durchlassspannungen für LEDs A und Di (ich =1, 2, 3, 4 und 5) bei einer Stromdichte von 170 A/cm 2
Für eine umfassendere Analyse berechnen wir die WPE als Funktion der Injektionsstromdichte für alle untersuchten LEDs, wie in Abb. 11 gezeigt. Die WPEs für LEDs Di (ich =1, 2, 3 und 4) sind höher als für LED A. Der WPE für LED D5 überschreitet den für LED A nur, wenn die Injektionsstromdichte größer als 43 A/cm 2 . ist . Der niedrigere WPE für LED D5 bei einer Stromdichte von weniger als 43 A/cm 2 ist auf den zusätzlichen Durchlassspannungsverbrauch am NPN-AlGaN-Übergang zurückzuführen, wie bereits erwähnt. Aus der Nebenfigur ist ersichtlich, dass die EQE mit zunehmender Mg-Dotierungskonzentration für die p-AlGaN-Schicht einen ansteigenden Trend zeigt. Die WPE nimmt jedoch mit der weiteren Erhöhung der Mg-Dotierungskonzentration für die p-AlGaN-Schicht ab. Daraus schließen wir, dass der Stromspreizeffekt und die Durchlassspannung sehr empfindlich auf das Mg-Dotierungsniveau der p-AlGaN-Einfügungsschicht reagieren.
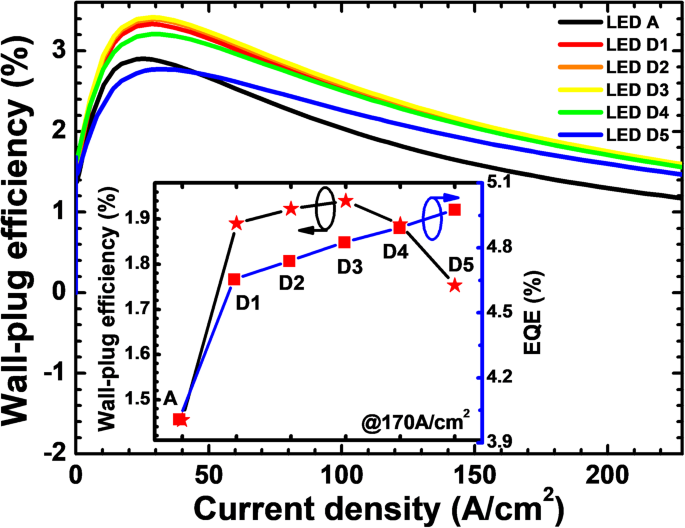
Beziehung zwischen WPE und dem Injektionsstrom für LEDs A und Di (ich =1, 2, 3, 4 und 5). Einschub:EQE und WPE für die untersuchten LEDs strukturiert mit einer p-AlGaN-Schicht mit unterschiedlichen Dotierungskonzentrationen bei einer Stromdichte von 170 A/cm 2
Einfluss der Dicke der p-AlGaN-Schicht auf den Stromausbreitungseffekt
In diesem Abschnitt wird der Einfluss der Dicke der p-AlGaN-Einfügungsschicht im NPN-AlGaN-Übergang auf die LED-Leistung untersucht. Zunächst werden für alle untersuchten DUV-LEDs zwei NPN-AlGaN-Übergänge (dh NPNPN-AlGaN-Übergang) aufgebracht, deren AlN-Zusammensetzung und Dotierungskonzentration für die p-AlGaN-Schicht im NPN-AlGaN-Übergang 0,61 und 1,5 betragen × 10 18 cm −3 , bzw. Wir setzen dann unterschiedliche Dicken von 18, 20, 24, 28 und 32 nm für die p-AlGaN-Schicht in LEDs Ti (ich =1, 2, 3, 4 bzw. 5). Die berechneten Leitungsband-Barrierenhöhen für jeden NPN-AlGaN-Übergang sind in Tabelle 3 dargestellt. Es ist ersichtlich, dass die Leitungsband-Barrierehöhe zunimmt, wenn die p-AlGaN-Schicht im NPN-AlGaN-Übergang dick wird, was die Reduzierung von <. ermöglicht i>ich 1 /Ich 2 und entsprechend die verbesserte Stromverteilung.
Wir berechnen und zeigen die horizontale Lochkonzentration im LQW für LEDs A und Ti (ich =1, 2, 3, 4 und 5) bei einer Stromdichte von 170 A/cm 2 in Abb. 12a. Die Lochverteilung wird eindeutig homogener, wenn der NPN-AlGaN-Übergang in die DUV-LED-Struktur eingeführt wird, und sie wird gleichmäßiger, wenn die Dicke der p-AlGaN-Schicht in dem NPN-AlGaN-Übergang größer wird. The reduced current crowding effect is ascribed to the higher conduction band barrier height in the depletion region caused by the thickened p-AlGaN layer in the NPN-AlGaN junction. Figure 12b and c exhibit the hole concentration levels and radiative recombination profiles, respectively, for LEDs A and Ti (ich =1, 2, 3, 4, and 5) at the injection current density of 170 A/cm 2 . The hole concentration levels and radiative recombination profiles are collected at the location of 120 μm away from the right-hand edge of the mesa. We can see that, when compared to that of LED A in the MQWs, LEDs Ti (ich =1, 2, 3, 4, and 5) show the higher hole concentration levels and thus higher radiative recombination profiles. Once the thickness of the p-AlGaN layer is increased, further enhanced hole concentration and radiative recombination in the MQWs can be obtained.
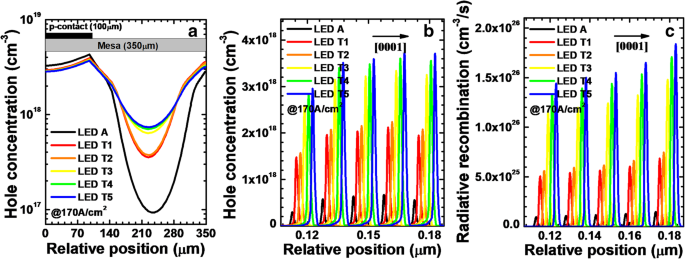
a Horizontal hole concentration in the LQW, b hole concentration levels, and c radiative recombination profiles in the MQWs for LEDs A and Ti (ich =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . We purposely shift the curves for b und c by 2 nm for easier identification
The observed optical power density and EQE for all studied LEDs in Fig. 13a agree well with the results shown in Fig. 12c, such that the increasing thickness for the p-AlGaN layer in the NPN-AlGaN junction can improve the optical power density and EQE. Moreover, we calculate and show the current-voltage characteristics for LEDs A and Ti (ich =1, 2, 3, 4, and 5) in Fig. 13b. It shows that the forward operating voltages for LEDs Ti (ich =1, 2, 3, and 4) exhibit a significant reduction when compared to that for LED A at the injection current density larger than 102 A/cm 2 , which is due to the significantly improved current spreading effect after adopting the NPN-Al0.61 Ga0.39 N junction as mentioned previously. However, a too thick p-AlGaN layer can cause an increase in the turn-on voltage owing to the parasitic N-AlGaN/P-AlGaN diode, e.g., LED T5 has the highest forward operating voltage among all the investigated LEDs when the current density is 170 A/cm 2 , which is also shown in the inset figure of Fig. 13b.
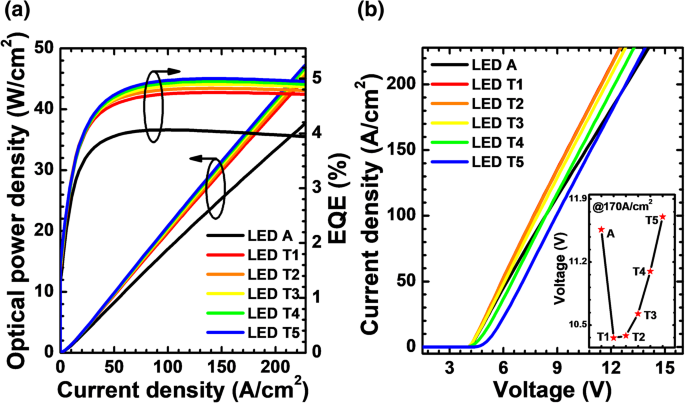
a EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ti (ich =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ti (ich =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
To this end, it is particularly important to further discuss the impact of higher forward operating voltage on DUV LED performance. Therefore, we calculate the WPE for all investigate devices and show the results in Fig. 14. We can see that the WPE for all LEDs with NPN-AlGaN junction exhibits distinct enhancement when compared to that for LED A. The presented WPEs in the inset figure also indicate that the NPN-AlGaN-structured DUV LED can save more electrical power than LED A. It is worth mentioning that the thickness for the p-AlGaN layer cannot be improved blindly, such that only when the thickness is properly set, then fully maximized WPE can be obtained.
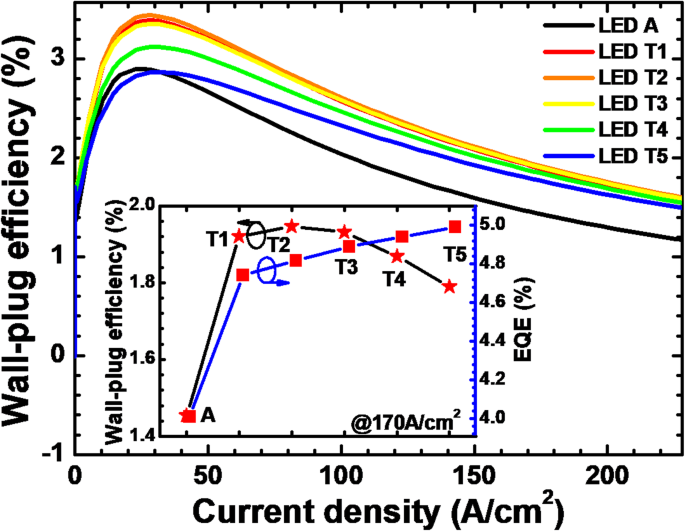
Relationship between WPE and the injection current for LEDs A and Ti (ich =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with a p-AlGaN layer with various thicknesses when the current density is 170 A/cm 2
Effect of the NPN-AlGaN Junction Number on the Current Spreading Effect
Finally, we investigate the influence of the NPN-AlGaN junction number on the current spreading effect. The p-Al0.61 Ga0.39 N layer is adopted in the NPN-AlGaN junction for the proposed DUV LEDs in this section, for which the Mg doping concentration and thickness are 1.5 × 10 18 cm −3 and 20 nm, respectively. LEDs Ni (ich =1, 2, 3, 4, and 5) have 1, 2, 3, 4, and 5 NPN-AlGaN junctions, respectively. As presented in Table 4, the conduction barrier heights of all NPN-AlGaN junctions are almost the same for LEDs Ni (ich =1, 2, 3, 4, and 5). However, the total conduction barrier height for NPN-Al0.61 Ga0.39 N junctions in each investigated DUV LED surely increases when more NPN-Al0.61 Ga0.39 N junctions are utilized. Thus, the value of N × R npn can be enhanced, which helps to better spread the current horizontally, i.e., the increased value of I 2 in Gl. 3 is favored. The enhanced current spreading effect can be observed in Fig. 15a. The hole concentration in the LQW can become more uniform if the NPN-AlGaN junction number becomes more.
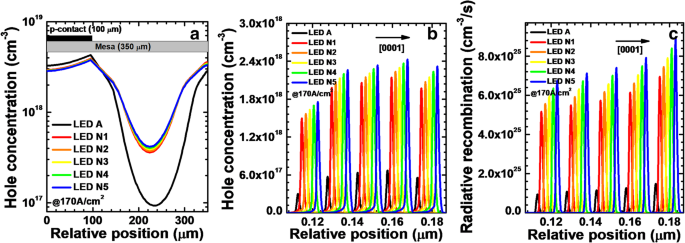
a Horizontal hole concentration in the LQW, b hole concentration, and c radiative recombination profiles in the MQWs for LEDs A and Ni (ich =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . We purposely shift the curves for b und c by 2 nm for easier identification
Then, the hole concentration levels and radiative recombination profiles in the MQWs for LEDs Ni (ich =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 are exhibited in Fig. 15b and c, respectively. We collect the hole concentration levels and radiative recombination profiles at the location of 120 μm away from the right-hand mesa edge. The hole concentration and radiative recombination are improved by using the NPN-Al0.61 Ga0.39 N junction, and further improvement can be obtained when more NPN-AlGaN junctions are included. Ascribed to the enhanced hole concentration in the MQWs, the optical power density and EQE for the DUV LEDs with NPN-AlGaN junction also shows a significant improvement. The current-voltage characteristics for all studied devices are shown in Fig. 16b, which illustrates that the forward operating voltages for LEDs Ni (ich =1, 2, 3, 4, and 5) are lower than that for LED A, and this indicates that the current spreading effect can help to reduce the forward voltage once the Mg doping concentration, thickness, and AlN composition for the p-AlGaN layer are appropriately applied to the NPN-AlGaN junction. The turn-on voltage for all LEDs with NPN-AlGaN junction is almost the same as that for LED A, which illustrates the negligible impact of the reversely biased N-AlGaN/P-AlGaN parasitic junction if the Mg doping concentration in the p-AlGaN layer is properly set, i.e., the p-AlGaN layer has to be completely depleted before the device is biased.
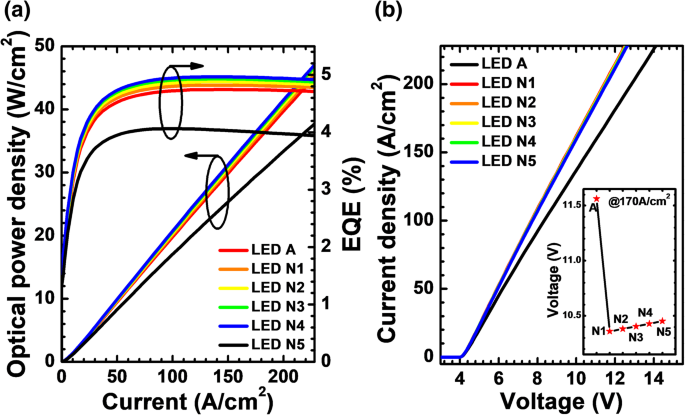
a EQE and optical power density in terms of the injection current and b current-voltage characteristics for LEDs A and Ni (ich =1, 2, 3, 4, and 5). Inset:the forward voltages for LEDs A and Ni (ich =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2
Last but not the least, the WPEs have also been demonstrated for LEDs Ni (ich =1, 2, 3, 4, and 5) in Fig. 17. The WPEs of all DUV LEDs with NPN-Al0.61 Ga0.39 N junction have been promoted owing to the reduced forward operating voltage. In the inset figure, we show the EQE and WPE for LEDs A and Ni (ich =1, 2, 3, 4, and 5) when the current density is 170 A/cm 2 . Although the EQE and WPE for LEDs Ni (ich =1, 2, 3, 4, and 5) increase with the increasing of the NPN-AlGaN junction number, clearly, we can see that the magnitude of the increase is gradually decreasing, which indicates that the NPN-AlGaN junction number also shall be set to a proper number, and we firmly believe that the device will consume more electrical power if too many NPN-AlGaN junctions are adopted in DUV LEDs.
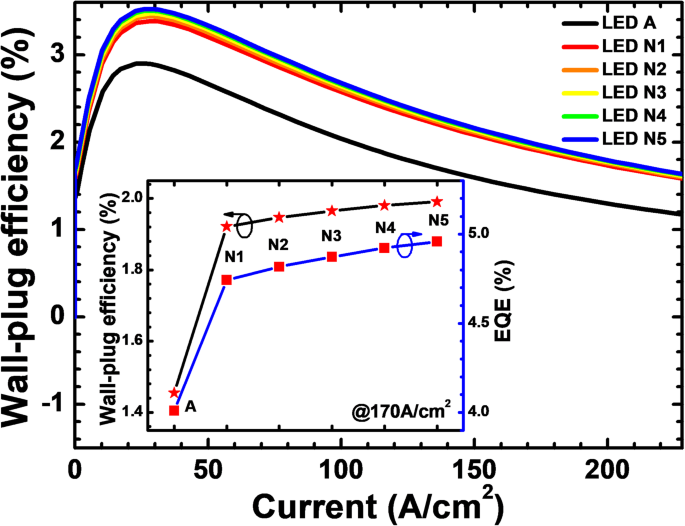
Relationship between WPE and the injection current for LEDs A and Ni (ich =1, 2, 3, 4, and 5). Inset:the EQE and WPE for the investigated LEDs structured with various NPN-AlGaN number when the current density is 170 A/cm 2
Schlussfolgerungen
To conclude, we have suggested embedding the NPN-AlGaN junction in the n-type electron supplier layer for DUV LEDs. After comprehensive and systematic discussions, we find that the NPN-AlGaN junction can reduce the current crowding effect in the p-type hole supplier layer and improve the hole injection for DUV LEDs. The NPN-AlGaN junction can tune the conductivity for the n-type electron supplier layer so that the current path in the p-type hole supplier layer can be manipulated. For further explorations, we have investigated the impact of different parameters for NPN-AlGaN junctions on the current spreading effect, the EQE, and the WPE. We find that the current can be further homogenized if the AlN composition, the Mg doping concentration, the thickness of the p-AlGaN insertion layer, and the NPN-AlGaN junction number are increased properly. Although the EQE can be promoted by using the proposed NPN-AlGaN junctions, the WPE is not always monotonically improving, which arises from the additional voltage drop at the barriers within the NPN-AlGaN junctions. Hence, more attention shall be made when designing NPN-AlGaN current spreading layers for DUV LEDs. However, we firmly believe that our results have provided an alternative design strategy to reduce the current crowding effect for DUV LEDs. Meanwhile, we also have introduced additional device physics and hence are very useful for the community.
Verfügbarkeit von Daten und Materialien
The data and the analysis in the current work are available from the corresponding authors on reasonable request.
Abkürzungen
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- CL:
-
Current spreading layer
- DUV LEDs:
-
Deep ultraviolet light-emitting diodes
- EQE:
-
Externe Quanteneffizienz
- ITO:
-
Indium tin oxide
- LQW:
-
Last quantum well
- MQWs:
-
Multiple quantum wells
- NPN-AlGaN:
-
n-AlGaN/p-AlGaN/n-AlGaN
- IQE:
-
Internal quantum efficiency
- SRH:
-
Shockley-Read-Hall
- WPE:
-
Wall-plug efficiency
- ZGO:
-
Zinc gallate
Nanomaterialien
- Die 4 primären Schlitzantriebstypen für Befestigungselemente
- Plädoyer für neuromorphe Chips für KI-Computing
- Das Design der Emissionsschicht für Elektronenvervielfacher
- Grüne Synthese von InP/ZnS-Kern/Schale-Quantenpunkten für die Anwendung in schwermetallfreien Leuchtdioden
- Die optimale Titan-Vorstufe zur Herstellung einer kompakten TiO2-Schicht für Perowskit-Solarzellen
- Fast Effizienz-Droop-Free AlGaN-basierte UV-Licht emittierende Dioden mit einer speziell entwickelten Übergitter-Elektronenblockierschicht vom p-Typ für eine hohe Mg-Dotierungseffizienz
- Perowskit-Leuchtdioden mit hoher Leuchtdichte mit hochpolarem Alkohollösungsmittel, das PEDOT:PSS als Lochtransportschicht behandelt
- Über die p-AlGaN/n-AlGaN/p-AlGaN-Stromaufweitungsschicht für AlGaN-basierte tief ultraviolette Leuchtdioden
- Einfluss der Quanten-Well-Breite auf die Elektrolumineszenz-Eigenschaften von AlGaN-Tiefen-Ultraviolett-Leuchtdioden bei verschiedenen Temperaturen
- Integration umweltfreundlicher Perowskite für hocheffiziente weiße Leuchtdioden



