EDX-, HAADF- und EELS-Studie mit atomarer Auflösung von GaAs1-xBix-Legierungen
Zusammenfassung
Die Verteilung legierter Atome in Halbleitern weicht oft von einer zufälligen Verteilung ab, was erhebliche Auswirkungen auf die Materialeigenschaften haben kann. In dieser Studie werden Rastertransmissionselektronenmikroskopietechniken verwendet, um die Verteilung von Bi in mehreren deutlich MBE-gewachsenen GaAs1−x . zu analysieren Bix Legierungen. Statistische Quantifizierung von HAADF-Bildern mit atomarer Auflösung sowie numerische Simulationen werden verwendet, um den Kontrast von Bi-haltigen Säulen an der atomar abrupten (001) GaAs-GaAsBi-Grenzfläche und den Beginn der CuPt-Typ-Ordnung zu interpretieren. Unter Verwendung monochromatischer EELS-Kartierung werden Rotverschiebungen der Bulk-Plasmonenenergie in einer Probe untersucht, die phasengetrennte Domänen aufweist. Dies legt eine einfache Methode nahe, lokale Volumenausdehnungen von GaAsBi-Elementarzellen zu untersuchen und Standard-Röntgen-basierte Gitterdehnungsmessungen zu ergänzen. Außerdem wird eine einzelvariante CuPt-geordnete GaAsBi-Probe, die auf einem abgeschnittenen Substrat aufgewachsen ist, mit EDX-Mappings der Zusammensetzung auf atomarer Ebene charakterisiert und der Ordnungsparameter wird geschätzt. Schließlich wird eine GaAsBi-Legierung mit einer vertikalen Bi-Zusammensetzungsmodulation unter Verwendung einer niedrigen Substratrotationsrate synthetisiert. Atomar aufgelöste EDX- und HAADF-Bildgebung zeigt, dass die übliche Anordnung vom CuPt-Typ entlang der [001]-Wachstumsachse mit einer Periode von drei Gitterkonstanten weiter moduliert wird. Diese unterschiedlichen GaAsBi-Proben veranschaulichen die Vielfalt der Bi-Verteilungen, die in dieser Legierung erreicht werden können, und geben Aufschluss über die Einbaumechanismen von Bi-Atomen und Möglichkeiten zur Weiterentwicklung von Bi-haltigen III-V-Halbleitern.
Einführung
Das Bismid GaAs1−x Bix Legierung hat umfangreiche Forschungen erfahren und repräsentiert die aufstrebende Klasse von Wismut-haltigen Gruppe-III-V-Halbleitern [1]. Wismut ist das größte stabile und ungiftige Element, das bei Einbau eine große GaAs-Bandlückenverringerung erzeugt. Die Substitution von Bi im Untergitter der Gruppe V ermöglicht das Erreichen einer Bandlückenverbiegung von bis zu 90 meV/Bi% in GaAsBi mit einer mäßigen Gitterspannung [1,2,3]. Eine große Spin-Bahn-Bandaufspaltung ist ein weiterer bemerkenswerter Effekt des Bi-Einbaus in das Gitter. Dies kann die Unterdrückung der Intervalenzbandabsorption und der Auger-Meitner-Rekombination in GaAs ermöglichen1−x Bix mit Konzentrationen x> 10 % [4]. In Kombination mit der verringerten Bandlückenempfindlichkeit machen diese Eigenschaften das Bismid zu einem attraktiven Kandidaten für Anwendungen unter anderem in langwelligen Infrarotlasern, Photodetektoren und Mehrfachsolarzellen [1, 5,6,7].
Der Einbau von Bi in die GaAs-Matrix erfordert unkonventionelle Wachstumsbedingungen, da Bi-Atome dazu neigen, bei typischen GaAs-Wachstumstemperaturen zu desorbieren [8,9,10]. Substrattemperaturen unter 400 °C werden typischerweise benötigt, ebenso wie nahezu stöchiometrische Gruppe III/V-Verhältnisse. Es muss darauf geachtet werden, dass die Bildung von Oberflächen-Ga- oder Bi-Tröpfchen vermieden wird, die in der Nähe dieser Bedingungen leicht auftreten können und mit Ungleichmäßigkeiten der wachsenden Schichtdicke und ihrer Zusammensetzung verbunden sind [11,12,13,14]. Niedrige Temperaturen, die zum Einbau größerer Bi-Konzentrationen erforderlich sind, machen die Molekularstrahl-Epitaxie (MBE) zur bevorzugten Synthesemethode, obwohl Fortschritte bei der Verwendung der metallorganischen Dampfphasen-Epitaxie gemacht wurden [15,16,17]. GaAsBi-Legierungen zeigen bei diesen niedrigen Wachstumstemperaturen immer noch eine überraschend hohe Photolumineszenz (PL)-Intensität, was auf den Bi-Tensideffekt und die reduzierte Dichte von As-bezogenen Punktdefekten zurückgeführt wird, die sich typischerweise in Niedertemperatur-GaAs bilden [18, 19]. Im Bild des Anti-Crossing des Valenzbandes (VB) erzeugen eingebaute einzelne Bi-Atome einen Resonanzzustand unterhalb des erweiterten GaAs-VB, was die optische Bandlückenreduzierung bewirkt [2, 20, 21]. First-Principles-Rechnungen zeigen auch, dass Cluster, die aus nahe wechselwirkenden Bi-Atomen bestehen, eine deutlich größere Bandlückenverengung erzeugen können als durch isolierte Bi-Atome [22]. Diese unterschiedlichen Bi-Konfigurationen erzeugen starke VB-Störungen und können lokalisierte elektronische Defektzustände einführen. Studien legen nahe, dass die durch große Bi-Atome erzeugte Gitterspannung dazu führt, dass die Cluster eher an Leerstellen VGa . binden und VAs [23]. As-reiche Wachstumsbedingungen sollten die Bildung von BiGa . begünstigen Hetero-Antisite-Defekte, von denen vorhergesagt wird, dass sie tiefe Löcher in GaAsBi verursachen [23, 24]. Ausgeprägte Exzitonenlokalisierungseffekte werden häufig bei temperaturabhängiger PL von GaAsBi-Legierungen beobachtet und werden solchen Bi-bezogenen Clustern und Defektkomplexen zugeschrieben [25, 26].
Wie viele andere ternäre III-V-Halbleiterlegierungen zeigt GaAsBi die Tendenz zur spontanen Ordnung [27]. Das sogenannte CuPtB -Typ-Ordnung, bei der die Konzentration von Bi-Atomen auf jeder zweiten {111}B-Typ-Ebene moduliert wird, wurde mit hochauflösender (Raster-)Transmissionselektronenmikroskopie (STEM/TEM) beobachtet [13, 17, 28]. Es ist allgemein anerkannt, dass der CuPtB -Typ-Modulation in III-V-Legierungen wird durch die Oberflächenrekonstruktionsdynamik angetrieben und wird von der (2 × 1)-Rekonstruktion aus Oberflächendimerreihen begleitet [27, 29,30,31,32,33]. Bei der Abscheidung auf flachen (001) GaAs-Substraten erfolgt die Ordnung auf zwei der vier verschiedenen Sätze von {111}-Ebenen. Eine einzelne B-Typ-Ordnungsuntervariante kann ferner durch Verwendung vicinaler Substrate ausgewählt werden. Tatsächlich haben neuere Arbeiten gezeigt, dass dies auch für GaAsBi gilt, wobei große CuPtB -Typ-Domänen wurden auf einem einzigen Satz von {111}B-Ebenen unter Verwendung von abgeschnittenen Wafern mit kleinem Winkel erreicht [34]. Die CuPt-Typ-Ordnung in GaInP2 ist wahrscheinlich am besten untersucht, da in dieser Legierung hochwertige Kristalle mit großen Ordnungsparametern erzielt werden können. Die Fernordnung ändert die Symmetrie der Zinkblendepunktgruppe vom tetraedrischen Td zu trigonal C3v [35, 36]. Bemerkenswerte Effekte aufgrund der Symmetriereduktion sind die Verengung der Bandlücke, die Polarisation der Photolumineszenz, Doppelbrechung und anisotrope Spannung [37,38,39]. Die Größe dieser Effekte hängt vom Fernordnungsparameter η . ab , die das Ausmaß der Elementarverteilung zwischen geordneten Gitterebenen zeigt. In einem CuPtB -geordnetes AB1−x Cx Legierung (für x <=0.5), wechselt das Gitter im B-elementreichen AB1−(x−η /2) Cx−η /2 und C-reiches AB1-(x + η /2) Cx + η /2 Monoschichten entlang einer <111>B-Richtung. Der Auftragsparameter η =0 in einer zufälligen Legierung, während in einer vollständig geordneten mit Konzentration x es ist also η =2x .
Offensichtlich unterscheidet sich die Verteilung von Bi innerhalb solcher geordneten Legierungen von einer zufälligen Legierung, und dies sollte bei der weiteren Ableitung der Legierungseigenschaften berücksichtigt werden [17, 40]. Das Verständnis der CuPt-Ordnungseffekte in verdünnten GaAsBi-Legierungen steht noch am Anfang und erfordert systematischere Studien. In diesem Artikel werden fortschrittliche aberrationskorrigierte STEM-Methoden verwendet, um die Modi der Bi-Verteilung in mehreren deutlich gewachsenen GaAsBi-Legierungen zu analysieren. Die Analyse erfolgt mittels statistischer STEM-Z-Kontrast-Bildverarbeitung und Bildsimulationen sowie atomar aufgelöster energiedispersiver Röntgenspektroskopie (EDX). Monochromatisierte Elektronenenergieverlustspektroskopie (EELS) wird verwendet, um lokale Volumenänderungen der Elementarzelle in GaAsBi unter Verwendung von Volumenplasmonenenergieverschiebungen zu untersuchen.
Ergebnisse und Diskussion
Das erste GaAs1−x Bix Das hier vorgestellte Beispiel S1, ist eine p-i-n-Heterodiode mit dotierten GaAs-Schichten und intrinsischem 420 nm Bismid. Die Wismutkonzentration in der Probe wurde unter Verwendung von Röntgenbeugung (hier nicht gezeigt) und Raumtemperatur-PL zu 4,5% Bi bestimmt, was eine Bandlücke von 1,10 eV anzeigt (SI Abb. S1). PL-Bandkantenmessungen werden unter Verwendung der Referenzen [1, 2, 4] in Bi% übersetzt. Ein HAADF-STEM-Bild mit atomarer Auflösung im Querschnitt entlang der [110]-Zonenachse nahe der GaAs-GaAsBi-Grenzfläche ist in Abb. 1a gezeigt. Die [001]-Wachstumsachse und andere relevante kristallographische Richtungen sind in 1b markiert und gelten auch für 1a . Da schwere Bi-Atome Sondenelektronen in großen Winkeln viel stärker streuen als Ga- oder As-Atome, hebt der HAADF-Detektor mit einem großen inneren Sammelwinkel (hier 90 mrad) die Bi-Verteilung in dünnen Proben positiv hervor. Der Kristall erscheint entlang einer <110>-Richtung als eine Ansammlung von atomaren "Hanteln", die parallel zur Wachstumsachse [001] ausgerichtet sind. Aufgrund ihrer ähnlichen Ordnungszahlen (Z) können Ga (31) und As (33) durch bloße Betrachtung der HAADF-Bilder nicht leicht unterschieden werden. Bi-haltige Gruppe-V-Säulen zeigen jedoch einen merklich höheren Kontrast. Wie in Fig. 1a und im vergrößerten Bereich nahe der Grenzfläche zu sehen ist, sind Gruppen-V-Säulen in der oberen Hälfte der Hanteln über Ga-Säulen positioniert. Dies wird erwartet, wenn GaAsBi entlang der [110]-Zonenachse abgebildet wird. Beachten Sie, dass die Polarität von Hanteln der Gruppe V/III umgekehrt wird, wenn die Probe in der orthogonalen Richtung [\(\overline{1}\)10] betrachtet wird. Diese orthogonalen Richtungen in der Ebene können auch unterschieden werden, da die CuPt-Typ-Ordnung auf {111}B-Typ-Ebenen auftritt und daher nur durch Abbildung entlang der [110]-Zonenachse gesehen werden kann. Abbildung 1b zeigt ein HAADF-Bild mit geringerer Vergrößerung tiefer im Film mit ausgeprägtem CuPtB -Typenbestellung. Die geordneten Domänen alternieren zufällig zwischen den beiden Sätzen von {111}B-Ebenen, d. h. (\(\overline{1}\)11) und (1\(\overline{1}\)1). Diese werden als B+ bezeichnet und B− Untervarianten nach Konvention. Die Fourier-Transformation des Bildes wird im oberen linken Einschub gezeigt. Die vier Haupt-Bragg-Flecken sind vom [111]*-Typ, während die vier 1/2[111]*-Typ-Übergitterflecken CuPtB . anzeigen Ordnung mit ähnlicher Größe auf den beiden Sätzen von {111}B-Ebenen. Ein phasenseparierter GaAsBi-Bereich ist in Fig. 1b als dunklerer Streifen im unteren Bildbereich sichtbar. Diese Domäne erscheint dunkler als ein Bismid, da sie Bi-defizientes GaAs ähnlich ist. Aufgrund der Metastabilität von GaAsBi-Legierungen wurde in vielen Artikeln über eine spinodale Zersetzung und Phasentrennung berichtet [11,12,13,14, 41, 42]. Für eine klarere Darstellung des B+ und B− Untervariantenordnung, Abb. 1c, d werden durch Bilden unter Verwendung von 1/2[111]* Übergitterreflexionspaaren dargestellt. Auf jedes Übergitterpaar im reziproken Raum wird eine Maske angewendet und in den reellen Raum invers Fourier-transformiert. Hellere Regionen von (111)-Ebenen in diesen Bildern zeigen an, dass die Ordnung ausgeprägter ist, oder mit anderen Worten, dass der Ordnungsparameter lokal variiert. Es gibt auch Schwankungen in der Dicke der TEM-Probenoberfläche aufgrund der Probenvorbereitung durch einen fokussierten Ionenstrahl. Die Probenpräparation kann amorphe Oberflächenschichten und geschmolzene Ga-Atomagglomerate auf der Oberfläche hinterlassen, die schwache Bildintensitätsmodulationen verursachen können. Ga streut jedoch viel schwächer zu den großen Winkeln als Bi-Atome und sollte die Analyse der Bi-Verteilung nicht wesentlich beeinflussen. Der Pfeil in Fig. 1d zeigt einen Bereich mit ordnenden Antiphasengrenzen. Über eine solche Grenze hinweg ist das B+ (B− )-Domäne ändert ihre Phase, indem sie alle Bi-reichen Ebenen in As-reiche Ebenen umschaltet. Anordnende Antiphasengrenzen können sich durch Gleiten von Versetzungen oder aufgrund eines zufälligen Wechsels zwischen B+ . bilden und B− Domänen während des Wachstums [43]. Letzteres scheint hier der Fall zu sein.
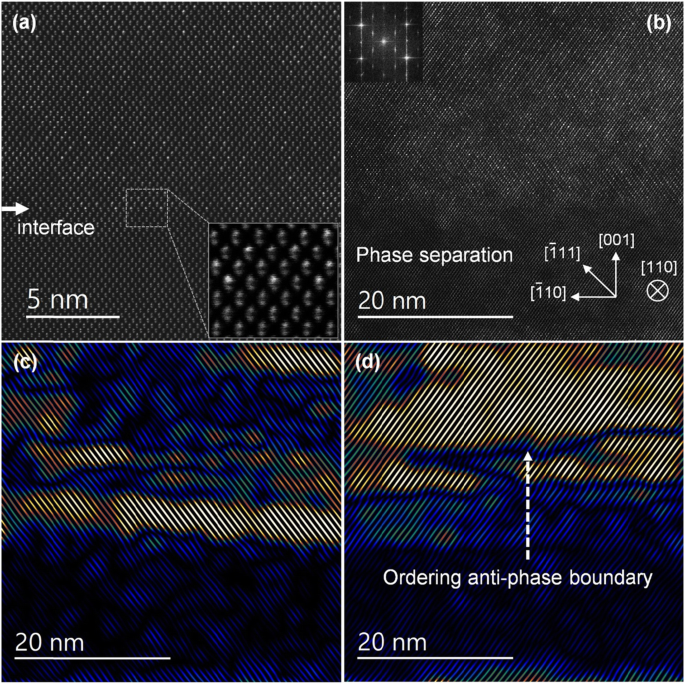
a HAADF-Querschnittsbild des S1-GaAs-GaAsBi-Grenzflächenbereichs der Probe. Unten rechts wird ein vergrößerter Einschub der Benutzeroberfläche angezeigt. Die kristallographischen Richtungen sind die gleichen wie in Fig. 1b. b HAADF-Bild der Probe entfernt von der Schnittstelle. In der Mitte ist eine verlängerte, spontan phasenseparierte GaAs-ähnliche Domäne zu sehen. Einschub zeigt die Fourier-Transformation des Bildes. c Ein Bild, das aus (b ) unter Verwendung des 1/2[\( \overline{1} \)11]* Paares von Übergitterreflexionen. Hellere Farben weisen auf eine ausgeprägtere Ordnung hin. d Ein Bild, das aus (b ) unter Verwendung des Paares von ½[1\( \overline{1} \)1]*Reflexionen
Die Quantifizierung des in Abb. 1a gezeigten HAADF-Bildes wird als nächstes durchgeführt, indem die räumlichen Verteilungen der Streuquerschnitte der atomaren Säulen (SCS) berücksichtigt werden (siehe Methoden). Der StatSTEM-Algorithmus wird verwendet, um Spalten mit zweidimensionalen Gaussianen anzupassen, und der SCS einer gegebenen Spalte wird als Volumen unter dieser Gaussianer definiert [44, 45]. Dies ist eine parametrische modellbasierte Quantifizierung im Gegensatz zur direkten Integration von Säulenintensitäten in ein experimentelles Bild. Der parametrische Modellansatz kann zuverlässiger sein, wenn die Spaltenintensitäten dazu neigen, sich zu überlappen, wie beispielsweise in <110> GaAsBi. Die Verteilung von SCS in der quantifizierten Abb. 1a ist in Abb. 2b als Histogramm aufgetragen, das vorläufig mit fünf Gaussianern gefittet wird. Die räumlichen Verteilungen von SCS werden dann in Fig. 2a auf der Modellstruktur aufgetragen, die aus einer Überlagerung von Gaussianern besteht, wobei die gleichen Farbschemaquadrate auf jeder Spalte platziert werden. Die SCS von Ga- und As-Säulen überlappen stark und erzeugen den Hauptpeak im Histogramm. Dies ist auf ähnliche Z-Zahlen dieser Atome sowie eine zusätzliche experimentell eingeführte Verbreiterung zurückzuführen (siehe Methoden). Durch Auftragen der unteren Gauss-Komponente (dunkelblaue Farbe) oder der oberen (helleres Blau) innerhalb dieses Hauptpeaks zeigt sich, dass ~ 60 % von zB As-Säulen in der GaAs-Pufferschicht korrekt identifiziert werden, wie an der Hantelpolarität zu erkennen ist . Zum Vergleich ist die SCS-Quantifizierung der unteren GaAs-Pufferschicht allein in der ergänzenden Abbildung S2 dargestellt. Es legt nahe, dass derzeit mehr als zwei Gaussianer benötigt werden, um Ga- und As-Säulen im Sichtfeld besser zu unterscheiden, und weist darauf hin, dass sich ihr mittlerer SCS um bis zu 10 % unterscheidet. Dieser Unterschied stimmt mit unseren unten gezeigten Simulationen und auch den Ergebnissen von Beyer et al. [17], wobei Ga- und As-integrierte Säulenintensitätsverteilungen in [010] GaAsBi aufgelöst wurden. Das Vorhandensein stark streuender Bi-Atome erweitert den SCS auf Werte über ~ 5,5 × 10 5 e - Å 2 (siehe SI Abb. S2), wodurch die rechte Schulter in Abb. 2b entsteht. Es ist mit drei Gaussianern ausgestattet, um versuchsweise Spalten mit höherem Bi-Gehalt zu unterscheiden. In Abb. 2a ist eine atomar abrupte GaAs-GaAsBi-Grenzfläche zu sehen. Eine genauere Betrachtung zeigt, dass die erste Gruppe-V-(001)-Säulenschicht mit einer signifikanten Anzahl von Bi-Atomen auf jeder zweiten Hantel entlang der Grenzfläche angeordnet ist. Dies deutet auf den Beginn der CuPt-Typ-Ordnung früh im epitaktischen Wachstum hin. Eine Darstellung der atomaren Konfiguration der Schnittstelle ist im Einschub von Fig. 2b gezeigt. Es stellt die Anordnung der Atome entlang der Grenzfläche mit Bi-Atomen (orange) auf jeder zweiten Spalte entlang der ersten Gruppe-V-Ebene (001) wieder her. Die ersten ~ 4–5 (001) Atomebenen in Abb. 2a zeigen keine Prädisposition für CuPt B+ oder B− Untervarianten. Ausgeprägtere Einzelvarianten-Ordnung geht aus der ~ 6. (001) Gruppe-V-Atomschicht hervor und wechselt dann zu der anderen Untervariante. Keine Antisite-Defekte BiGa werden durch die SCS-Verteilung an der Grenzfläche angezeigt, die als Quadrate auf Gruppe-III-Säulen mit Farben, die mit Bi assoziiert sind, sichtbar wäre. Eine Wahrscheinlichkeit von mehreren BiGa Antisite findet sich jedoch in der oberen rechten Ecke der Abbildung. Sowohl die Gruppe-III- als auch die Gruppe-V-Spalte zeigen Bi-ähnliche SCS auf einzelnen Hanteln in dieser Region, was auch auf das Vorhandensein von Defektpaaren BiGa . hinweisen kann -BiAs . Um eine bessere Vorstellung von der Anzahl der Bi-Atome zu erhalten, die an der Bestimmung des SCS beteiligt sind, beachten Sie, dass sich in einer nominell 20–25 nm dicken Probe 50–60 Atome in einer <110>-Säule befinden. Daher sind 2–3 Bi-Atome am wahrscheinlichsten in einer Gruppe-V-Säule für eine zufällige Legierung mit derzeit 4,5% Bi zu finden. Diese Zahl wird in geordneten Bi-reichen Ebenen höher sein und in Spalten mit der größten SCS wahrscheinlich bis zu 6–7 erreichen [40]. Um die StatSTEM-Analyse zu ergänzen, wird als nächstes eine Mehrschicht-HAADF-Bildsimulation an einer modellierten GaAsBi <110> Superzellenstruktur präsentiert (siehe Methoden für Details).

a Eine Verteilung von SCS in Abb. 1a. Die farbigen Quadrate auf jeder Atomsäule entsprechen dem SCS-Farbschema in Abb. 2b. b Ein Histogramm von SCS in Abb. 1a, angepasst mit 5 Gaussianern. Der Einschub zeigt eine Darstellung des Grenzflächenbereichs. Ga-Atomsäulen sind dunkelblau, As in hellerem Blau und Säulen, die Bi enthalten, sind orange. c Simuliertes HAADF-Bild der in Abb. 2d gezeigten GaAsBi-Struktur. Die Anzahl der Bi-Atome in einer Spalte wird in orangefarbenen Klammern rechts neben jeder Gruppe-V-Spalte angezeigt. Die angepassten SCS-Werte werden links von jeder Spalte angezeigt und auf den größten SCS-Wert in der Superzelle normalisiert. d Die Modellstruktur von GaAsBi <110> wurde seitwärts gedreht, um Bi-Positionen (orange), hellblaue As- und dunkelblaue Ga-Atome hervorzuheben. Der Pfeil zeigt die Richtung des einfallenden Strahls
Der Beitrag von Bi-Atomen zur HAADF-Bildintensität bei unterschiedlichen Probentiefen kann aufgrund dessen, was grob als Channeling bezeichnet wird, nichtlinear sein [46,47,48,49]. Die Quantifizierung von Dotierstoffen auf atomarer Ebene erfordert daher eine Überlegung, wenn man die wahre Variation der Zusammensetzung von der Variation der Dotierstoffkonfigurationen unterscheidet [50, 51]. Um das Kanalisierungsverhalten zu veranschaulichen, wird die durchschnittliche Sondenintensitätsvariation mit der Probentiefe bei Positionierung über der As-Säule in <110> GaAs numerisch simuliert und in der ergänzenden Abb. S3 gezeigt (siehe Methoden). Die für HAADF-Simulationen verwendete Modell-GaAsBi-Struktur mit einer Dicke von 17 nm ist in Abb. 2d seitlich gedreht gezeigt, um die Positionen von Bi-Atomen (orange) innerhalb von As-Säulen (As – hellblau, Ga – dunkelblau) hervorzuheben. Der Pfeil markiert die einfallende Strahlrichtung. Das in Abb. 2c gezeigte simulierte Bild wird mit dem StatSTEM-Algorithmus zum Vergleich mit dem Experiment angepasst. Die erhaltenen SCS-Werte wurden auf den SCS-Wert der Spalte mit dem größten SCS (6 Bi-Atome) normalisiert und auf zwei signifikante Stellen gerundet. Diese normalisierten Werte werden links von jeder Spalte angezeigt. Die Anzahl der Bi-Atome in jeder Gruppe-V-Spalte ist in Klammern rechts von der Spalte angegeben. In einer vernünftigen Übereinstimmung mit den vorherigen Ergebnissen liegt der Unterschied zwischen den As- und Ga-SCS-Werten bei ~ 8%. Der Unterschied in der SCS zwischen reinen As-Säulen und As-Säulen mit einem Bi-Atom liegt im Bereich von 2–4% für unterschiedlich positionierte Bi-Atome. Man kann deutlich sehen, dass unterschiedliche Bi-Konfigurationen für unterschiedliche Zusammensetzungen falsch interpretiert werden können, z. B. 4 und 5 Atome oder 5 und 6 Atome, die fast die gleichen SCS-Werte ergeben. Bi-Atome in einer Säule zur unteren Oberfläche tragen immer weniger zum SCS bei. Mehrere hier untersuchte Konfigurationen mit 2 Bi-Atomen nacheinander scheinen große Beiträge zu den SCS-Werten zu liefern. Eine Anordnung von 2 Bi-Atomen entlang einer [110]-Säule ist in der Praxis zu erwarten, wenn CuPtB Ordnung in GaAsBi-Legierungen erzeugt tatsächlich Struktureinheiten mit C3v Punktgruppensymmetrie, d. h. ein Ga-Atom mit den nächsten Nachbarn 1 As- und 3 Bi-Atome. Beachten Sie, dass identische Ga-Säulen auch Variationen in ihrem SCS von bis zu ~ 0,02 aufweisen. Dies legt nahe, dass ihre unmittelbare Umgebung, z. B. in der Nähe stark streuende Säulen, durch Mehrfachstreuung oder durch Kopplung an sie über verlängerte Sondenschwänze zusätzliche Intensität beiträgt [52]. Kürzlich eingeführte bessere Skalierungsalgorithmen eröffnen die Möglichkeit, die quantenmechanischen Multislice-Berechnungen zu beschleunigen und so die oben genannten Effekte genauer zu untersuchen [53, 54].
Um die STEM-Analyse von Probe S1 abzuschließen, wird Elektronenenergieverlustspektroskopie (EELS) verwendet, um die Volumenplasmonenenergien zu kartieren. Die Verschiebungen der Plasmonenenergie werden mit den Volumenänderungen der Elementarzelle und damit mit der Legierungsdehnung in Beziehung stehen, wie im Folgenden erörtert wird. GaAs weist einen Hauptplasmonenpeak bei ~ 16 eV auf und zeigt im Gegensatz z. B. CdTe keine komplexen Interferenzmerkmale von Zwischenbandübergängen [55]. Als erste Näherung zur Interpretation der gemessenen Plasmonenenergieänderungen verwenden wir das Drude-Lorenz-Modell für Freie-Elektronen-Elektronengas, wobei freie Elektronen jetzt die Valenzelektronen im Halbleiter sind [56]. Die Volumenplasmonenenergie in diesem Modell ist gegeben als \( {E}_p=\hslash {\left(N{e}^2/Vm{\epsilon}_0\right)}^{1/2} \), wobei N ist die Anzahl der Valenzelektronen in der Elementarzelle, e ist die Elektronenladung, V ist das Elementarzellenvolumen, m die Elektronenmasse ist und ε 0 ist die Permittivität des freien Raums. Das einfache Drude-Lorenz-Modell sagt die Plasmonenenergie im Allgemeinen innerhalb weniger Prozent in Halbleitern voraus und muss um Bandstruktureffekte korrigiert werden, wenn eine bessere Übereinstimmung angestrebt wird [56]. Wie in InGaAs und Gruppe-III-Nitrid-Halbleiterlegierungen gezeigt, ist die Änderung des Elementarzellenvolumens die führende Größe, die die Plasmonenenergieverschiebungen bestimmt [57, 58]. In ähnlicher Weise bewirkt die Substitution isoelektronischer Bi-Atome in der GaAs-Matrix hauptsächlich eine Erweiterung des Elementarzellenvolumens, V , und verschiebt damit die Plasmonenenergie rot. Im Folgenden verwenden wir die gemessenen Spitzenenergien von GaAs und GaAsBi, um die lokale Änderung des Spannungszustands in der GaAsBi-Schicht über ein Verhältnis ihrer Elementarzellenvolumina abzuleiten.
Es wird eine Region ausgewählt, die phasenseparierte GaAsBi-Domänen enthält, die im HAADF-Bild gezeigt sind. 3. EELS-Spektren wurden von jedem Pixel gesammelt, das das gleichzeitig aufgenommene HAADF-Bild begleitete (siehe Methoden und SI Fig. S4 für das Rohspektrum). Gestrichelte Linien im HAADF-Bild zeigen die Grenzflächen zwischen dem intrinsischen GaAsBi und den p-Typ (unten) und n-Typ (oben) GaAs-Schichten. Die Grenzlinien der Grenzfläche wurden aus STEM-Bildern mit geringerer Vergrößerung (hier nicht gezeigt) bestimmt. Die schützende Pt-Schicht ist als kontrastreicheres Material über dem oberen n-GaAs sichtbar. GaAs-Schichten und auch phasenseparierte Domänen innerhalb von GaAsBi erscheinen im HAADF-Bild dunkler. Das vertikale Linienprofil auf der rechten EELS-Abbildung wurde durch horizontales Binning aller EELS-Datenpunkte erfasst. Es zeigt die relative Verschiebung der Peak-Energie des Volumenplasmons, EGaAsBi -EGaAs , bezogen auf die GaAs-Plasmonenenergie (gemessen mit 16,23 eV) innerhalb der unteren p-GaAs-Pufferschicht. Der Plasmonenpeak verschiebt sich durchschnittlich um 0,08 eV zu niedrigeren Energien in der GaAsBi-Schicht. Die kleinen Variationen innerhalb von ~ 0,01 eV liegen bei den Quantifizierungsrauschpegeln. Die phasengetrennten Domänen in der Nähe des oberen GaAs (dünne Schicht) und des unteren (zwei sich überschneidende Domänen) kehren zum GaAs-Plasmonenenergiewert zurück, was darauf hindeutet, dass sie vernachlässigbare Bi-Konzentrationen enthalten. Dotierstoffkonzentrationen in den GaAs-Schichten (Ordnung 10 17 cm −3 ) sind im Vergleich zu N . unbedeutend /V und sollte die Plasmonenenergie nicht beeinflussen. Wir betrachten nun zwei Grenzfälle für GaAs1−x Bix Elementarzellenvolumen V; bei einem ist das Gitter vollständig entspannt und bei einem anderen vollständig auf das GaAs-Substrat gespannt. Im vollständig entspannten Fall ist die Elementarzelle kubisch mit der Gitterkonstanten a ≈ 5,684 Å bei x =4,5% Bi [1]. Unter Verwendung der obigen Quadratwurzelbeziehung zwischen Plasmonenenergie und V , sollte die Energieverschiebung relativ zu GaAs \(\Delta{E}_p^{GaAs Bi}=16.23\left({\left({V}_{GaAs}/{V}_{GaAs Bi}\right) }^{1/2}-1\right)=-0.132\mathrm{eV}\), der deutlich größer ist als der gemessene. Basierend auf Relaxationstrends von GaAsBi-Legierungen schätzen wir, dass ~30% des Gitters in diesem 420 nm dicken Film relaxiert sind, wenn man bedenkt, dass er während des Wachstums der obersten n-GaAs-Schicht auch eine kurze thermische Ausheilung erfuhr. Daher wird die durchschnittliche GaAsBi-Elementarzelle im vollständig entspannten Szenario überschätzt und erklärt die oben erhaltenen größeren \(\Delta{E}_p^{GaAsBi}\). In der anderen Grenze wird angenommen, dass das Bismidgitter vollständig gespannt ist, wobei die Gitterkonstante in der Ebene gleich der von GaAs ist (a =5,653 Å). Die Gitterkonstante außerhalb der Ebene, die erforderlich ist, um die Energieverschiebung von −0,080 eV abzurufen, wird dann gefunden a z =5,709 Å. Dies ist ein vernünftiges a z -Wert und kann mit den XRD-RSM-Messungen von GaAsBi unter Druckspannung auf GaAs-Substrat verglichen werden [1, 34, 59]. Aufgrund der Relaxation wird erwartet, dass die tatsächlichen Gitterkonstanten zwischen diesen beiden Grenzfällen liegen. Dies demonstriert eine vielversprechende Charakterisierungsmethode, die komplementär zu röntgenbasierten Techniken in solchen metastabilen Legierungen Informationen über die Gitterspannung liefern kann.

Querschnitts-HAADF-Bild (links) der p-i-n-Probe S1 mit markierten GaAs- und GaAsBi-Schichten. Dunklere Bereiche innerhalb von GaAsBi sind phasengetrennte Domänen. Das Linienprofil (rechts) zeigt die Energieverschiebung des EELS-Volumenplasmonenpeaks, E GaAsBi -E GaAs , relativ zur GaAs-Pufferschicht. Das Profil ist eng mit dem gleichzeitig aufgenommenen HAADF-Bild auf der linken Seite ausgerichtet. EELS-Datenpixel sind in horizontaler Richtung vollständig gebinnt und zeigen somit räumlich gemittelte Werte an. Der Maßstabsbalken beträgt 100 nm und gilt auch für die vertikale Achse des EELS-Profils
Die zweite GaAsBi-Probe, S2, wurde über einer GaAs-Pufferschicht aufgewachsen, die auf einem abgeschnittenen Ge-Substrat abgeschieden wurde (siehe Methoden). Die Ge-GaAsBi-Hetero-Epitaxie wurde in unserer vorherigen Arbeit analysiert, die auch großdomäne Einzelvariante CuPtB . demonstrierte Ordnung in GaAsBi [34]. Zusätzliche Daten werden in dieser Arbeit präsentiert und dienen der Vollständigkeit der Diskussion über die Bi-Atomordnung. Die Gesamt-Wismut-Konzentration in dieser Probe beträgt ~ 5,8%, gemessen mit PL (SI Abb. S1) [34]. Der bei dieser Epitaxie verwendete Verschnitt in Kombination mit der GaAs-Pufferschicht trägt dazu bei, die Bildung von gegenphasigen Domänen in GaAsBi zu vermeiden, die beim direkten Aufwachsen auf unpolarem Ge immer noch mühsam zu beseitigen sind [60,61,62]. Abbildung 4a zeigt den GaAs-GaAsBi-Grenzflächenbereich mit der GaAsBi-Schicht, die im HAADF-Bild sichtbar heller ist. Im Gegensatz zum vorherigen GaAsBi-Film, der auf einem flachen GaAs-Substrat abgeschieden wurde, wird hier ein einzelner CuPtB Bestelluntervariante wird aufgrund des Verschnitts ausgewählt. Dies ist im HAADF-Bild und seiner Fourier-Transformations-Einfügung oben rechts zu sehen, die ein Paar von 1/2[\( \overline{1} \)11]* Übergitterflecken zeigt. Abbildung 4b wurde durch Aufbringen einer Maske auf das Paar von Übergitterreflexionen analog zu Abbildung 1c, d gebildet. Es zeigt eine viel gleichmäßigere und großflächigere Ordnung im Film. Atomar aufgelöste EDX-Bilder wurden von dieser Probe aufgenommen, um den Ordnungsparameter η . abzuschätzen basierend auf der Zusammensetzungsanalyse. Das chemische EDX-Mapping übertrifft häufig die alternative Kernverlust-EELS-Quantifizierung, die bei der Quantifizierung von hochenergetischen und verzögerten Ionisationskanten tendenziell ein schlechteres Signal-Rausch-Verhältnis aufweist [56, 63,64,65]. Die STEM-Scanrichtung wurde geändert, um die geordneten (\( \overline{1} \)11) Ebenen horizontal auszurichten. Abbildung 4c–e zeigt die Wiener-gefilterten Röntgen-Elementarkarten. Die Anordnung der Bi-Atome auf jeder zweiten (\( \overline{1} \)11) Ebene ist klar und folgt den As-Atompositionen. Für die EDX-Zusammensetzungsquantifizierung wurden zwei Datensätze mit jeweils 512 × 512 Pixeln aus unterschiedlichen Bereichen der Probe unter identischen experimentellen Bedingungen aufgenommen. Unterregionen wurden ausgerichtet und die Rohsignale summiert, was insgesamt 10 Frames ergab. Vertikale Linienprofile von horizontal summierten Rohdaten von As-K und Bi-M sind in Fig. 4f gezeigt. Um die Wismutzusammensetzung in der Bi-reichen und Bi-defizienten (111)-Ebene zu quantifizieren, wurde ein 3 Å breites Integrationsfenster verwendet, das auf den Atomebenen zentriert ist. Nach Subtraktion des Hintergrunds und Mittelung über alle (111)-Ebenen zeigt es, dass die Bi-Röntgenstrahlenzahlen in den Bi-reichen Ebenen ~ dreimal höher sind. Die Gesamtkonzentration von 5,8% Bi in der Probe, wie sie durch PL- und XRD-RSM-Messungen erhalten wurde, wird dann verwendet, um die Bi-Röntgenstrahlenzählungen linear auf die Zusammensetzung zu skalieren, was zeigt, dass Bi bis zu 9% in den Bi-reichen Ebenen erreicht. Der Ordnungsparameter kann somit geschätzt werden (siehe Einführung) als η =0,07. Beachten Sie, dass ein vollständig geordnetes Bismid mit dieser gesamten Bi-Konzentration den Ordnungsparameter η =0,116 hätte. Ähnlich wie bei der HAADF-Analyse leidet die EDX-Quantifizierung einzelner Säulen unter Kanalisierungseffekten, da das Ionisationspotential der Kernelektronen stark lokalisiert ist. Wie von anderen Autoren in Alx . gezeigt Ga1-x Als Legierung kann dies aufgrund unterschiedlicher Dotierstoffkonfigurationen zu einer Standardabweichung von bis zu ~ 5 % der Röntgenzahlen führen [50]. In Anbetracht der Abweichung stellt sich heraus, dass die Röntgenstrahlenzahlen in nicht zu dicken Proben immer noch linear mit einer Anzahl von Dotierstoffen skalieren. Der Konfigurationsfehler in der vorliegenden Studie wird durch effektive Mittelwertbildung über ~ 11 Atomsäulen in jeder (111)-Ebene für insgesamt ~ 130 Säulen minimiert. Darüber hinaus können Elektronensondenschweife und Mehrfachstreuung eine Signaldelokalisierung in EDX-Bildern bewirken [52]. HAADF-Bildsimulationen im vorherigen Abschnitt, die die Variation der Ga-SCS-Werte zeigen, weisen auf das erwartete Ausmaß dieser Effekte bei der EDX-Quantifizierung hin. Aufgrund der inhärent niedrigen Bi-Röntgenzahlen in solchen verdünnten Legierungen scheint das Schrotrauschen derzeit der Hauptfaktor zu sein, der die Genauigkeit begrenzt.

a HAADF-Bild der GaAsBi-Probe S2 nahe der Grenzfläche zur GaAs-Pufferschicht, aufgewachsen auf abgeschnittenem (001) Ge. Die Fourier-Transformation oben rechts zeigt ein Paar von Peaks, die die Ordnung auf dem einzelnen Satz von (\(\overline{1}\)11)-Ebenen anzeigen. b Ein Bild, das aus (a ) unter Verwendung des Übergitterpaares 1/2[\( \overline{1} \)11]* Bragg-Flecken. c –e Wiener-gefilterte EDX-Bilder der GaAsBi-Probe mit Bi-M-, As-K- und Ga-K-Röntgenemissionen wie angegeben. Beachten Sie, dass in EDX-Daten die kristallographischen Richtungen gedreht werden, um die geordneten (\( \overline{1} \)11) Ebenen horizontal auszurichten. f Horizontal summiertes vertikales Röntgenzählungsprofil des rohen As-K- und Bi-M-Signals. Zwei ausgerichtete Datensätze werden kombiniert, um das Profil zu erhalten
The final GaAsBi sample, S3, that we wish to explore here was synthesized under conditions to create so-called vertical composition modulations (VCM) (see Methods) [66]. In contrast to samples S1 and S2, the VCM is achieved in S3 by utilizing a slower substrate rotation rate (RPM), which is coupled to intrinsically inhomogeneous elemental flux profiles reaching the substrate in a typical MBE chamber. The III/V elemental ratio within a sample region can be oscillated by controlling the RPM and the film growth rate to obtain the desired VCM period. A vertical spiral in regards to Bi concentration can be obtained in GaAsBi this way, as has been well explained in M.A. Stevens et al. [66]. A cross-sectional HAADF image of the GaAsBi sample S3 is shown in Fig. 5a, grown on a (001) GaAs substrate rotated 5 RPM and 300 nm/h growth rate. Total bismuth composition in the sample area under investigation was determined to be 2.8% Bi using room-temperature PL (SI Fig. S1). The VCM is visible with a well-defined superlattice-like appearance. The tendency to CuPtB order is also visible in this image, and here it incurs the additional vertical modulation. The inset on the top right shows Fourier transform of the image with arrows marking the pair of stripes, which result from Bi content modulation along the [\( \overline{1} \)10] direction on every second plane and accordingly reduced extent of (111)-type ordered planes along [001].

a HAADF image of the VCM GaAsBi sample S3. Bi concentration modulations along the growth [001] direction are visible, as well as CuPtB ordering within the Bi-enriched planes. Inset shows Fourier transform with reminiscent CuPtB ordering modulated by the VCM. b A combined Wiener filtered elemental EDX image of the sample with normalized X-ray counts for each element, Bi-green, As-Blue, and Ga-red. c Vertical X-ray count profile extracted from 3 × 3 binned raw As-K and Bi-M signals, horizontally summed within a 5 nm window
The sample was also investigated using atomic scale elemental EDX mapping. Figure 5b shows overlaid normalized and color-coded X-ray signals of Bi-M (green), As-K (blue), and Ga-K (red). The corresponding elemental Wiener filtered maps are shown in SI Fig. S5. The peak-to-peak distance between Bi-rich regions is 1.7 nm, which indicates the VCM period is ~ 3 lattice constants. The peak positions do not align on a single Bi-rich (001) plane. This offset reflects that Bi atoms with higher concentrations are dispersed over 2–3 group-V (001) atomic planes, which is clearer in the HAADF image (Fig. 5a). Figure 5c shows 4 VCM periods by plotting vertical Bi-M and As-K line profiles of horizontally summed counts in a 5 nm wide window from the 3 × 3 binned raw EDX data. Despite the signal noise, As-K X-ray count profile seems to inversely follow the Bi-M profile showing small dips at Bi-enriched regions. Such a correlation between substitutional element and the host element X-ray signals may be exploited in future atomic scale EDX analysis of dilute alloys.
Conclusions
Three different bulk GaAsBi samples regarding Bi distribution modes were investigated in this study using STEM techniques. The quantification of scattering cross sections was applied to a GaAs-GaAsBi hetero-diode grown on conventional (001) GaAs, showing atomically abrupt interface and early CuPtB -type ordering onset. Numerical multislice image simulations within the frozen-phonon thermal scattering approximation were used to investigate GaAsBi HAADF images. It showed that due to channeling, the configurational Bi variations can translate into apparent compositional variations. To carry out column-by-column Bi atom counting would thus require numerical image analysis. EDX mapping was presented of a single-variant ordered dilute GaAsBi sample grown on an offcut substrate. To avoid the configurational errors in elemental EDX quantification, the X-ray signals were averaged over many columns in (111) atomic planes, and the order parameter was estimated to be η =0.07 in this sample. The atomic-resolution HAADF and EDX were also used to analyze a VCM GaAsBi film synthesized using a slow substrate rotation rate. This sample showed Bi content modulation in the [001] axis with a period of three lattice constants in addition to the CuPtB ordering. Finally, bulk plasmon energy mapping using monochromated EELS was performed on a GaAs-GaAsBi hetero-diode. As the plasmon energy shift in dilute GaAsBi is related to the unit-cell volume changes, this provides a simple method to complement XRD-based techniques to examine local strain-state in GaAsBi alloys.
Methods
Three different samples were examined in this study, samples S1, S2, and S3, all grown by solid-source MBE. The first sample, S1, is a GaAsBi p-i-n heterojunction, with an intrinsic 420-nm GaAsBi layer containing ~ 4.5 Bi%, as evaluated by XRD (not shown here) and room-temperature PL (SI Fig. S1). The n-type and p-type GaAs layers are 100 nm and 80 nm thick, respectively, and were doped to 5 × 10 17 cm −3 concentrations using Si and Be, respectively. The sample was grown on an n-type (001) GaAs substrate using SVT-A MBE reactor equipped with metallic Ga and Bi sources and a two-zone valved arsenic cracker. The GaAs layers were deposited using a 330-nm/h growth rate at 600 ° C substrate temperature, supplying arsenic overpressure. GaAsBi layer was grown using a 100 nm/h rate, 10 revolutions per minute (RPM) substrate rotation, 360 ° C (thermocouple readings), As/Ga BEP around 1.08, Bi flux ~ 10 −7 Torr. The (2 × 1) surface reconstructions were seen using RHEED during GaAsBi deposition. The second sample, S2, consisted of 280 nm thick GaAsBi with 1.0 eV band gap and~ 5.8 Bi%, as measured by PL (SI Fig. S1) and XRD [34]. This sample was grown over a ~ 300 nm GaAs buffer layer which was deposited on a p -type (001) Ge substrate with 6° offcut towards <110>. The first 50 nm of the buffer was deposited by migration-enhanced epitaxy. The remaining 300 nm of GaAs buffer was synthesized at 600 °C. GaAsBi film was grown at 350 °C, with BEP ratio of As to Ga in the range 1.063 to 1.1, and Bi/Ga ratio 0.35–0.37. The substrate was rotated 15 at RPM. The third and final sample, S3, was grown using the Veeco GENxplor MBE chamber, with the same type of sources and the arsenic cracker as in the SVT-A reactor. The sample consists of 500 nm GaAsBi with ~ 2.8% Bi, as measured by PL (SI Fig. 1) and XRD (not shown here). The layer was grown at 310 °C (band edge absorption measurement, kSA Bandit), on top of 80 nm GaAs buffer layer grown at 580 °C. The growth rate of the bismide was 0.5 monolayers/s, As/Ga BEP ratio ~ 1.35, and Bi flux ~ 8 × 10-8 Torr. The substrate was rotated at 5 RPM.
Transmission electron microscopy samples were prepared in a cross-sectional geometry by the focused ion beam (FIB) lift-out technique using FEI Helios Nanolab 650 dual-beam microscope. The samples were polished to 20–25 nm thickness, as measured by the EELS Log-ratio method, and argon-oxygen plasma-cleaned or degassed before loading into a microscope. HAADF imaging was carried out using cold-field emission double aberration-corrected JEOL JEM-ARM200CF operated at 200 kV [67]. The inner collection semi-angle of the HAADF detector was set to 90 mrad, with 22 mrad probe convergence semi-angle. The HAADF image analysis was carried out using StatSTEM add-on for Matlab [44]. Single width 2D Gaussian functions were fitted to the atomic columns after background subtraction. HAADF image simulation was performed using the muSTEM software using 15 frozen-phonon configurations, transmission functions with 0.02 Å square pixel size, and supercell size ~ 20 × 15 Å [68, 69]. The above experimental STEM probe parameters were used with defocus C1 =0, C3 =0.002 mm, and C5 =1 mm spherical aberration coefficients, and a fully coherent electron probe. Kirkland multislice code was used to calculate the average of electron probe intensity versus sample depth, averaged over 10 frozen-phonon configurations [68]. The intensity average is taken across the atomic column in a 1 Å wide window. X-ray energy dispersive spectroscopy was performed using 0.98 steradian solid-angle windowless silicon drift-detector JEOL JED-2300. The probe current was set to 200 pA for EDX characterization and pixel dwell time 0.2 msec. The EDX images were 512 × 512 pixels in size, and a total of 5 frames were accumulated for each data set. Wiener filtering was applied to both EDX images for visualization, and sample drift-correction was used on Fig. 5 EDX data. On-axis electron energy-loss spectrum imaging was carried out using a modified monochromated Nion Hermes-200 (ChromaTEM) operated at 100 kV. The probe convergence semi-angle was set to 10 mrad, EELS collection semi-angle 35 mrad, 0.02 eV EELS energy dispersion, and 0.005 s EELS exposure time. The FWHM of the ZLP with beam positioned on the sample was measured to be 0.11 eV. Gatan DM 3.01 image analysis software was employed post-acquisition to center and removes the ZLP. The spectrum image was binned vertically by a factor of 4 and fully binned in the horizontal direction. Cross-correlation-based “Align SI by peak” algorithm was employed within the Gatan DM 3.01 software to determine plasmon peak shifts. Room-temperature PL measurements were carried out using a 420-mm focal length monochromator along with thermoelectrically cooled InGaAs photodetector. Diode-pumped solid-state laser emitting at the wavelength of 532 nm with an estimated power density of 5 kW/cm 2 was used as an excitation source.
Verfügbarkeit von Daten und Materialien
The datasets used and/or analyzed during the current study are available from the corresponding author on reasonable request.
Abkürzungen
- BEP:
-
Beam equivalent pressure ratio
- EELS:
-
Electron energy-loss spectroscopy
- FFT:
-
Fast Fourier transform
- HAADF:
-
High-angle annular dark-field
- MBE:
-
Molekularstrahlepitaxie
- PL:
-
Photolumineszenz
- STEM:
-
Scanning transmission electron microscopy
- SCS:
-
Scattering cross-section
- VCM:
-
Vertical composition modulations
- EDX:
-
X-ray energy dispersive spectroscopy
Nanomaterialien
- Anwendung von Molybdänmetall und seinen Legierungen
- 4 Verwendungen von Hafnium | Die Anwendungen von Hafnium und Hafniumlegierungen
- Anwendungen von Molybdän und Molybdänlegierungen
- Eigenschaften und Anwendungen von Kupfer-Nickel-Legierungen
- Ein Leitfaden für zuverlässiges Kupfer und seine Legierungen
- Arten und Eigenschaften:Aluminium-Bronze-Legierungen
- Metalllegierungen und Streckgrenze verstehen
- 5 wichtige industrielle Metalllegierungen und ihre Verwendung
- Wärmebehandlung von Aluminium und Aluminiumlegierungen
- Wärmebehandlung von Kupfer und Kupferlegierungen



