Analytisches Modell für die maximale Kanaltemperatur in Ga2O3-MOSFETs
Zusammenfassung
In dieser Arbeit haben wir ein genaues analytisches Modell zur Schätzung der maximalen Kanaltemperatur von Ga2 . vorgeschlagen O3 MOSFETs mit nativen oder hochwärmeleitenden Substraten. Die Wärmeleitfähigkeit von Ga2 O3 ist anisotrop und nimmt mit steigender Temperatur deutlich ab, was beides wichtig für das thermische Verhalten von Ga2 . ist O3 MOSFETs und somit im Modell berücksichtigt. Numerische Simulationen werden über COMSOL Multiphysics durchgeführt, um die Abhängigkeit der Kanalmaximaltemperatur von der Leistungsdichte durch Variation der geometrischen Parameter des Geräts und der Umgebungstemperatur zu untersuchen, was gute Übereinstimmungen mit dem analytischen Modell zeigt und die Gültigkeit dieses Modells liefert. Das neue Modell ist aufschlussreich für ein effektives Wärmemanagement von Ga2 O3 MOSFETs.
Hintergrund
Galliumoxid (Ga2 O3 )-basierte Metall-Oxid-Halbleiter-Feldeffekttransistoren (MOSFETs) sind ausgezeichnete Kandidaten für die Leistungselektronik der nächsten Generation, die von zwei großen Vorteilen von Ga2 . profitiert O3 :die signifikant hohe Bandlücke (~ 4,8 eV) und qualitativ hochwertige Bulk-Kristalle, die zu geringen Kosten hergestellt werden [1]. Es wurden enorme Anstrengungen unternommen, um seine elektrischen Eigenschaften in allen Aspekten wie Stromdichte [2], Durchbruchspannung [3] und Leistungskennzahl [4] zu verbessern. Mit der experimentellen Bestätigung seines beispiellosen Potenzials für leistungselektronische Geräte [5,6,7,8,9] ist es nun von größter Bedeutung, die Leistung und Zuverlässigkeit von Ga2 . zu untersuchen O3 MOSFETs, wie das Thema Selbsterwärmungseffekte und damit die maximale Kanaltemperatur (T max ), aufgrund seiner relativ geringen Wärmeleitfähigkeit (κ , 0,11–0,27 Wcm −1 K −1 bei Raumtemperatur) [1].
In den letzten Jahren wurden verschiedene Methoden zur Schätzung des T max von Ga2 O3 MOSFETs wurden theoretisch und experimentell vorgeschlagen [10,11,12,13]. Im Allgemeinen können numerische Simulationen T . quantitativ abschätzen max eines bestimmten Gerätes. Dies ist jedoch zeitaufwendig [14]. Andererseits ist die Extraktion von T max durch Experimente wird immer unterschätzt [15]. Daher muss ein analytisches Modell erstellt werden, um das T . adäquat zu modellieren max in Ga2 O3 MOSFETs, die eine ausreichende Genauigkeit mit Zeiteffizienz und qualitativen Bewertungen bieten können [14].
In diesem Papier schlagen wir ein analytisches Modell von T . vor max für Ga2 O3 MOSFETs durch Anwendung der Kirchhoff-Transformation unter Berücksichtigung der Abhängigkeit von κ zur Temperatur und kristallographischen Richtungen für Ga2 O3 . Das vorgeschlagene Modell kann auf Ga2 . angewendet werden O3 MOSFETs mit nativen oder hochwärmeleitenden Substraten. Die Validität und Genauigkeit des analytischen Modells wird methodisch durch den Vergleich mit den numerischen Simulationen über COMSOL Multiphysics überprüft.
Methoden und Modellentwicklung
Das analytische Modell für T max in Ga2 O3 MOSFETs werden basierend auf der in Abb. 1 gezeigten Struktur vorgeschlagen. Die wichtigsten Parameter der Struktur sind in Tabelle 1 aufgeführt. Tatsächlich wurde gezeigt, dass sich die Joulesche Erwärmung an der Drain-Kante des Gates in Ga2 O3 MOSFETs [13]. Um das Modell zu vereinfachen, wird angenommen, dass die Heizwirkung des Gates gleichmäßig ist [12] und aufgrund seiner vernachlässigbaren Dicke das Gateoxid vollständig durchdringen kann. Verschiedene Substratmaterialien unter Ga2 O3 Kanäle werden in diesem Modell berücksichtigt, z. B. Bulk-Ga2 O3 und hohe κ Materialien, die auf die Machbarkeit und Kompatibilität der Platine abzielen. Somit wird die Vorrichtung als ein zweischichtiges Problem angesehen. Das Substrat kontaktiert einen idealen Kühlkörper, sodass die Unterseite isotherm ist und seine Temperatur der Umgebungstemperatur entspricht (T amb , 300 K standardmäßig). An anderen Oberflächen des Bauwerks wurden adiabatische Randbedingungen auferlegt. Diese Randbedingungen lassen sich zusammenfassen als [14, 16]

Das schematische Diagramm von Ga2 O3 MOSFET
$${\kappa}_{y}{\left.\frac{\partial T}{\partial y}\right|}_{y={t}_{ch}+{t}_{sub}} =\left\{\begin{array}{c}\frac{P}{{L}_{g}} \left|x\right|\le \frac{{L}_{g}}{2} \\ 0 \left|x\right|>\frac{{L}_{g}}{2}\end{array}\right.,$$ (1) $${\left.T\right|} _{y=0}={T}_{amb},$$ (2) $${\left.\frac{\partial T}{\partial x}\right|}_{x=-\frac{ L}{2}}={\left.\frac{\partial T}{\partial x}\right|}_{x=\frac{L}{2}}=0,$$ (3)wo P , T und κ y bezeichnen die Verlustleistungsdichte, Temperatur und Wärmeleitfähigkeit der [010]-Richtung für Ga2 O3 , bzw. Es sollte betont werden, dass die Einheit von P ist in diesem Papier W/mm.
Die κ Wert von Ga2 O3 , einer der Schlüsselparameter für die thermische Materialeigenschaft, spielt eine wichtige Rolle bei der Diffusion der Wärmewirkung sowie der Genauigkeit des Modells. Das heißt, eine sorgfältige Beschreibung von κ Wert ist aufgrund seiner starken Anisotropie und Temperaturabhängigkeit erforderlich [17]. Im Allgemeinen ist die Abhängigkeit von κ von Ga2 O3 auf Temperatur (T ) entlang zweier unterschiedlicher Kristallorientierungen ([001] und [010]) ist gegeben durch
$${\kappa}_{\left[001\right]}\left(T\right)=0.137\times {\left(\frac{T}{300}\right)}^{-1.12},$ $ (4) $${\kappa}_{\left[010\right]}\left(T\right)=0.234\times {\left(\frac{T}{300}\right)}^{- 1.27}.$$ (5)Die Vergleichsstudie von T max an verschiedenen P wurde von COMSOL Multiphysics unter Berücksichtigung konstanter und realistischer κ . durchgeführt , bzw. Wir haben festgestellt, dass bei einem P von 1 W/mm, T max Werte von 533 K bzw. 622 K werden erhalten (nicht gezeigt). Daher ist es unbedingt erforderlich, die Auswirkungen von T . zu berücksichtigen und kristallographische Richtung auf dem κ von Ga2 O3 im Modell.
Das Temperaturverhalten wird durch die Wärmeleitungsgleichung bestimmt. Die Wärmeleitungsgleichung im stationären Zustand in Ga2 O3 Domain ist
$$\frac{\partial }{\partial x}\left({\kappa}_{x}\left(T\right)\frac{\partial T}{\partial x}\right)+\frac{ \partial }{\partial y}\left({\kappa}_{y}\left(T\right)\frac{\partial T}{\partial y}\right)=0,$$ (6)wo κ x bezeichnet die Wärmeleitfähigkeit der [001]-Richtung für Ga2 O3 . Die nichtlineare Wärmeleitungsgleichung kann mit der Kirchhoff-Transformation gelöst werden. Die Anwendung der Kirchhoff-Transformation kann jedoch aufgrund der stark anisotropen κ in Ga2 O3 , die streng genommen nur für Materialien mit isotropem κ . gilt [14]. Angesichts der obigen Einschränkung sollte κ . nicht berücksichtigt werden x und κ y zwei unabhängige Variablen sein. Abbildung 2 zeigt die Beziehung zwischen dem thermischen Widerstand, d. h. 1/κ , und T für Richtungen von [001] und [010] über ein großes T Reichweite bzw. Es ist ersichtlich, dass 1/κ y kann durch 1/(cκ . ersetzt werden x ) und c gleich 1,64 gewählt wird. Folglich ist Gl. (6) lässt sich in die folgende Gleichung umwandeln:

Die Beziehung zwischen dem thermischen Widerstand und T für Richtungen von [001] und [010]. Grüne Symbole und rote Linien kennzeichnen tatsächliche bzw. angepasste Werte. Die blaue Linie repräsentiert die Hypothese von 1/κ y 1/(cκ x ), wobei c = 1.64
$$\frac{\partial }{\partial\mathrm{x}}\left({\kappa}_{x}\left(T\right)\frac{\partial T}{\partial x}\right) +\frac{\partial }{\partial\mathrm{y}}\left({c\kappa}_{x}\left(T\right)\frac{\partial T}{\partial y}\right) =0.$$ (7)Basierend auf den vorhergehenden Näherungen von κ x und κ y , ist die Kirchhoffsche Transformation uneingeschränkt anwendbar. Außerdem ist auch ersichtlich, dass der Kehrwert von κ wird erwartet, dass es proportional zu T ist Um die Rechenkomplexität zu reduzieren, wird der Ausdruck von 1/κ x kann vereinfacht werden als 1/κ x = aT + b , wie in Abb. 2 gezeigt. Der Grund für die Verwendung von a , b und c ist nur die Bequemlichkeit, die folgenden Gleichungen zu schreiben.
Durch die Anwendung der Kirchhoff-Transformation und der Methode der Variablentrennung wird der Ausdruck von T max kann abgeleitet werden als
$$\begin{ausgerichtet} T_{{max}} =&\\ &\,\left( {T_{{amb}} + \frac{b}{a}} \right)exp\left( {\frac {{aP\left( {t_{{ch}} + t_{{sub}} } \right)}}{{cL}} + \frac{{aPSL}}{{\sqrt c \pi ^{2} L_{g} }}} \right) - \frac{b}{a}, \\ \end{aligned}$$ (8)wo
$$S=\sum_{n=1}^{\infty}\frac{\mathrm{sin}n\pi \frac{{L}_{g}}{L}}{{n}^{2} }\frac{\mathrm{sinh}2n\pi \frac{{t}_{ch}+{t}_{sub}}{\sqrt{c}L}}{\mathrm{cosh}2n\pi \ frac{{t}_{ch}+{t}_{sub}}{\sqrt{c}L}}.$$ (9)Es sei darauf hingewiesen, dass S ist eine konvergente unendliche Reihe und ihr Näherungswert, der leicht zu erhalten ist, wird bei der Berechnung anstelle ihres tatsächlichen Wertes verwendet.
Im Fall von Ga2 O3 MOSFETs mit hohem κ Substrate kann die Kirchhoffsche Transformation theoretisch nicht direkt angewendet werden. Damit die Transformation gültig ist, müssen die Randbedingungen entweder isotherm sein (konstante T Oberfläche) oder haben eine feste Wärmestromdichte. Aufgrund der unterschiedlichen κ von Ga2 O3 und Substratmaterial werden diese beiden Randbedingungen am Ga2 . nicht vollständig erfüllt O3 /Substrat-Schnittstelle. In Anbetracht dessen, dass die κ von Ga2 O3 ist viel niedriger als hoch κ Substrat, eine Hypothese, die isotherme Grenzfläche zwischen dem Ga2 O3 und das Substrat, eingeführt wird. Diese Hypothese ist entscheidend für die Ableitung des Ausdrucks T max und seine Gültigkeit wird später überprüft. In diesem Fall ist der Wärmewiderstand (R TH ) von hohem κ Substrat, ein Verhältnis der Differenz zwischen den T int und T amb und das PW , d. h. R TH = (T int —T amb ) / (PW ), kann berechnet werden als R TH = LW /(κt sub ), wobei W ist die Breite des Substrats [19]. Somit ist der Ausdruck der Temperatur von Ga2 O3 /Substrat-Schnittstelle (T int ) ist
$${T}_{int}=\frac{P{t}_{sub}}{{\kappa}_{sub}L}+{T}_{amb},$$ (10)wo κ sub ist die Wärmeleitfähigkeit des heterogenen Substrats, die als konstant angenommen wird. Außerdem sollte darauf hingewiesen werden, dass der thermische Grenzwiderstand zwischen Ga2 O3 und heterogene Substrate sind nicht im Modell enthalten. Daher wird mit Hilfe von Gl. (8), der Ausdruck von T max für Ga2 O3 MOSFETs mit heterogenem Substrat können abgeleitet werden als
$$\begin{ausgerichtet} T_{{max}} =&\\ &\;\left( {T_{{int}} + \frac{b}{a}} \right)exp\left( {\frac {{aPt_{{ch}} }}{{cL}} + \frac{{aPSL}}{{\sqrt c \pi ^{2} L_{g} }}} \right) - \frac{b} {a}, \\ \end{aligned}$$ (11)wo
$$S=\sum_{n=1}^{\infty}\frac{\mathrm{sin}n\pi \frac{{L}_{g}}{L}}{{n}^{2} }\frac{\mathrm{sinh}2n\pi \frac{{t}_{ch}}{\sqrt{c}L}}{\mathrm{cosh}2n\pi \frac{{t}_{ch }}{\sqrt{c}L}}.$$ (12)Ergebnisse und Diskussion
Die Gültigkeit des analytischen Modells für das T max in Ga2 O3 In diesem Abschnitt wurden MOSFETs systematisch verifiziert, wobei sowohl natives Substrat als auch das Gegenstück mit höherer Wärmeleitfähigkeit berücksichtigt wurden. Die Gültigkeit eines Modells lässt sich am besten anhand experimenteller Daten testen. Einige wichtige geometrische Parameter konnten jedoch in experimenteller Literatur nicht gefunden werden, wie zum Beispiel t sub und L in Ref.-Nr. [12]. Daher wird die Finite-Elemente-Simulation, eines der genauesten Mittel, verwendet, um unser Modell zu verifizieren. Abbildung 3 zeigt die Abhängigkeit von T max zur Leistungsdichte P erhalten aus COMSOL Multiphysics und analytischem Modell für Ga2 O3 MOSFET mit nativem Substrat. Es werden verschiedene Schlüsselparameter berücksichtigt, einschließlich der Gerätelänge L , Substratdicke t sub , und Umgebungstemperatur T amb . Wie in Abb. 3a gezeigt, ist das T max wird natürlich mit der erhöhten Leistungsdichte erhöht und die Steigerungsrate wird mit dem kleineren L . verstärkt . Dies wird darauf zurückgeführt, dass das Gerät mit größerem L ermöglicht die Wärmeableitung aus dem aktiven Bereich und daher ist seine Gesamttemperatur niedriger als bei einem kleineren L gleichzeitig P [11]. Das heißt, es ist R TH , die Steigung der Kurven, ist kleiner als die der letzteren. Da die κ . außerdem von Ga2 O3 sinkt mit steigender Gesamttemperatur, sein R TH steigt auch langsamer als bei kleinerem L folglich, was in Abb. 3a [19] offensichtlich ist. Auch die Untersuchung der Abhängigkeit von T max auf t sub durchgeführt wurde, wie in Abb. 3b dargestellt. Es wird beobachtet, dass der Trend von T max in Bezug auf P ist derselbe wie in Abb. 3a. Das dünnere Substrat erzeugt immer den abgeschwächten Anstieg von T max über die vergrößerte Leistungsdichte, die verständlich ist, dass je dünner das Substrat, je niedriger die Gesamttemperatur, desto kleiner R TH und seine Steigerungsrate, genau wie die Analyse in Abb. 3a. Abbildung 3c vergleicht den Einfluss von T amb am T max als P steigt. Es ist offensichtlich, dass die Differenz zwischen zwei Kurven langsam zunimmt, was sich von denen in Abb. 3a, b unterscheidet. Normalerweise R TH wird von den geometrischen Parametern des Geräts und dem κ . dominiert Wert des Materials. Bedenkt man jedoch, dass die Struktur in diesem Fall feststeht, ist der Anstieg von R TH wird nur durch die Abnahme von κ . induziert von Ga2 O3 . Andererseits wird ein hohes Maß an Übereinstimmung für das vorgeschlagene Modell beobachtet, das die T . berücksichtigt - und richtungsabhängige Beziehung für das κ von Ga2 O3 , was die skalierbare Natur des Modells bestätigt. Im Durchschnitt beträgt der Unterschied zwischen vorgeschlagenem Modell und Simulation < 1 K. Die insgesamt beobachtete hervorragende Übereinstimmung deutet darauf hin, dass das vorgeschlagene Modell sehr effektiv und genau ist.

Abhängigkeit von T max auf a die Länge des Geräts L , b die Dicke der Substratschicht t sub , und c Umgebungstemperatur T amb bei unterschiedlicher Leistung P . Symbole und Linien kennzeichnen die Ergebnisse des vorgeschlagenen Modells bzw. der Simulation
Ebenso werden, wie in Fig. 4 gezeigt, ähnliche Vergleiche für Ga2 . wiederholt O3 MOSFETs auf hohem κ Substrat, SiC. Hier die Schritte für L und T amb die wir gewählt haben, sind größer als die in Abb. 3, und die unterschiedliche Kanaldicke t ch wird anstelle von t . betrachtet sub in diesem Fall. Andernfalls ist die Differenz zwischen zwei Kurven von T max in Bezug auf P in jeder Figur ist aufgrund der effizienten Wärmeableitungskapazität des SiC-Substrats nicht zu unterscheiden. Die κ von SiC (3,7 Wcm −1 K −1 ) angewendet ist ein Standardparameter in der COMSOL Multiphysics Software. Dank hoher κ von SiC ist aus allen Zahlen deutlich zu erkennen, dass der Anstieg von T max ist ungefähr linear als P steigt, was bedeutet, dass der Einfluss der Temperatur auf den R TH des Gerätes ist vernachlässigbar. Es sei darauf hingewiesen, dass unser Modell diesen linearen Zusammenhang erfolgreich beschreiben kann. Es ist jedoch offensichtlich, dass die T max Die vom aktuellen Modell berechneten Werte sind niedriger als die von der Simulation vorhergesagten, und dieser Unterschied wird mit zunehmendem Stromverbrauch deutlicher. Um diesen Mechanismus zu zeigen, simuliertes T int werden mit zunehmender Leistung extrahiert und mit berechneten T . verglichen int nach Gl. (10) wie in Abb. 5 aufgetragen. Es zeigt sich, dass die Joulesche Erwärmung in der Mitte des Geräts konzentrierter wird als P steigt. Es gibt 0,5 K und 4 K ΔT zwischen Modell und Simulation an dieser Stelle, wenn P = 0,25 bzw. 1 W/mm. Aus diesem Grund kann unser Modell T . nicht genau vorhersagen max . Daher ist eine vernünftigere Hypothese von T int wird benötigt, um in Zukunft eine höhere Genauigkeit zu erreichen. Trotzdem ist das T max wird vom Modell vorhergesagt, dass es sogar unter einer Verlustleistungsdichte von 1 W/mm nur um < 4 K niedriger ist als durch Simulation. Das heißt, obwohl die Hypothese des einheitlichen T int nicht mit den Tatsachen übereinstimmt, kann unser Modell eine Schätzung von T . liefern max mit ausreichender Genauigkeit.
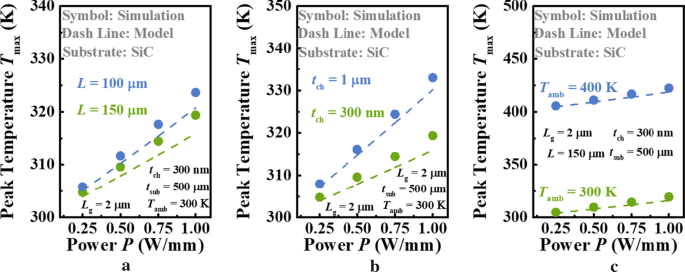
Abhängigkeit von T max von Ga2 O3 MOSFETs mit SiC-Substrat auf a die Länge des Geräts L , b die Dicke von Ga2 O3 Schicht t ch , und c Umgebungstemperatur T amb bei unterschiedlicher Leistung P . Symbole und Linien kennzeichnen die Ergebnisse des vorgeschlagenen Modells bzw. der Simulation
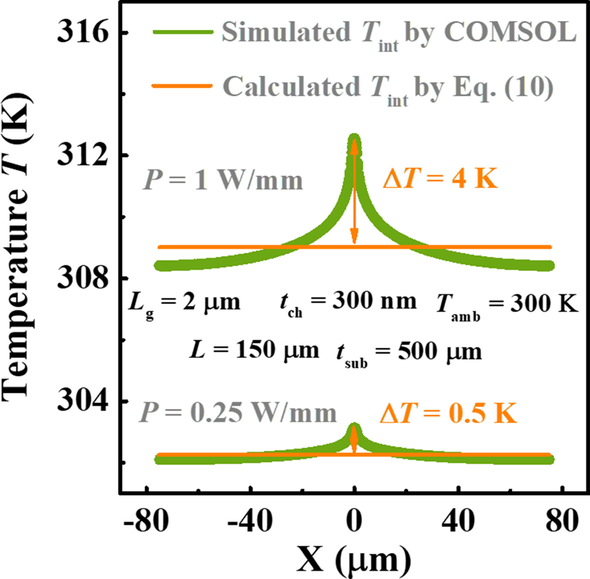
Vergleich von T int zwischen simuliert und berechnet nach Gl. (10) an verschiedenen P
Schlussfolgerungen
Ein genaues analytisches Modell zur Schätzung des T max von Ga2 O3 MOSFETs mit temperatur- und richtungsabhängiger Wärmeleitfähigkeit werden vorgestellt. Ein einfacher Ausdruck basierend auf Gerätegeometrie und Materialparametern wurde abgeleitet. Eine ausgezeichnete Übereinstimmung wurde zwischen dem Modell und den numerischen Simulationen von COMSOL Multiphysics durch Variation unterschiedlicher Leistungsaufnahme erzielt. Das vorgeschlagene Modell für die T max ist von großer Bedeutung für effektive Wärmemanagement-Leistungsgeräte, insbesondere Ga2 O3 MOSFETs.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Artikels unterstützen, sind im Artikel enthalten.
Abkürzungen
- Ga2 O3 :
-
Galliumoxid
- MOSFETs:
-
Metall-Oxid-Halbleiter-Feldeffekttransistoren
- AlGaN:
-
Aluminiumgalliumnitrid
- GaN:
-
Galliumnitrid
- SiC:
-
Siliziumkarbid
Nanomaterialien
- Eine Taxonomie für das IIoT
- Die Wissenschaft der Pigmentdispersion für maximale Effizienz verstehen!
- Temperaturüberwachung auf dem Raspberry Pi
- Das beste Zubehör für Ihren Raspberry Pi
- SICHT:Für Blinde
- Windows 10 IoT Core für Raspberry Pi 3 Model B+
- IBM-Wissenschaftler erfinden ein Thermometer für die Nanoskala
- Die Pandemie treibt ein neues Modell für die Entscheidungsfindung in der Lieferkette
- Die Herausforderung der 5S-Methode für die Industrie 4.0
- Danke für die Erinnerungen!



