Doppelfunktionen von V/SiOx/AlOy/p++Si-Gerät als Selektor und Speicher
Zusammenfassung
Dieser Brief stellt Doppelfunktionen vor, einschließlich Selektor- und Speicherumschaltung in einem V/SiOx /AlOy /p ++ Widerstandsfähiges Si-Speichergerät durch einfaches Steuern der Compliance-Strombegrenzung (CCL). Eine unidirektionale Schwellenschaltung wird nach einer Positivumformung mit einem niedrigen CCL von 1 μA beobachtet. Die Verschiebungen zur V-Elektrodenseite des Sauerstoffs bilden das VOx Schicht, wo die Schwellenschaltung durch das Metall-Isolations-Übergangsphänomen erklärt werden kann. Bei einer höheren CCL (30 μA), die auf das Gerät angewendet wird, wird eine bipolare Speicherschaltung erhalten, die auf die Bildung und den Bruch des leitenden Filaments in SiOy . zurückgeführt wird Schicht. 1,5 nm dickes AlOy Schicht mit hoher Wärmeleitfähigkeit spielt eine wichtige Rolle bei der Senkung des Ausschaltstroms für Speicher- und Schwellenschaltung. Durch die Temperaturabhängigkeit wird eine Hochenergiebarriere (0,463 eV) im LRS bestätigt, die in einem niederohmigen Zustand zu Nichtlinearität führen kann. Je kleiner die CCL, desto höher die Nichtlinearität, was eine größere Array-Größe im Cross-Point-Array bereitstellt. Die Koexistenz von Speicher und Schwellwertumschaltung gemäß CCL bietet die Flexibilität, das Gerät für seinen beabsichtigten Gebrauch zu steuern.
Hintergrund
Resistiver Direktzugriffsspeicher (RRAM) ist aufgrund seiner schnellen Schaltgeschwindigkeit [1, 2] und seines geringen Stromverbrauchs [3,4,5,6,7 .] einer der vielversprechenden Kandidaten für die nichtflüchtige Speichertechnologie der nächsten Generation ,8], Mehrebenenfähigkeit [9,10,11,12,13,14,15], hohe Skalierbarkeit [16,17,18,19,20] und 3D-Stacking-Fähigkeit [21,22,23,24,25 ]. Diese Eigenschaften eignen sich besonders für Storage Class Memory (SCM), die die Leistungslücke zwischen Dynamic Random Access Memory (DRAM) als Hauptspeicher und Solid State Drive (SSD) als Massenspeicher füllen können. Obwohl das RRAM-Gerät in den letzten Jahren große Fortschritte gemacht hat [1,2,3,4,5,6,7,8,9,10,11,12,13,14,15,16,17,18,19 ,20,21,22,23,24,25] bleibt jedoch ein wesentlicher Nachteil:Schleichstrom durch benachbarte Zellen tritt in einem High-Density-Cross-Point-Array auf [26]. Die Speichervorrichtung mit der Selektorkomponente sollte nichtlineare Strom-Spannungs-(I-V)-Kennlinien aufweisen, um dieses Problem zu überwinden [26,27,28,29,30,31,32,33,34,35]. Bisher wurden verschiedene Geräte mit nichtlinearen Konzepten wie komplementäres Widerstandsschalten (CRS) [26], Tunnelbarriere [27,28,29,30,31,32,33], Ag-basiertes Schwellenschalten [34], Diodentyp Selektor [35, 36], ovonic Threshold Switching (OTS) [37, 38] und Metall-Isolator-Übergang (MIT) [39, 40, 41, 42, 43] wurden berichtet. VOx als eines der typischen MIT-Materialien in potenziellen Anwendungen als optische und elektrische Schaltkomponente weit verbreitet sein könnte [40,41,42]. SiO2 wird häufig als Passivierungsschicht in der Halbleiterindustrie verwendet. Darüber hinaus ist Si-reiches SiOx (x < 2) kann als Widerstandsänderungsschicht im RRAM verwendet werden [44,45,46,47,48,49,50,51,52,53,54,55]. SiOx kann im Hinblick auf die Kompatibilität mit CMOS-Prozessen und die geringen Kosten gegenüber vielen anderen Materialien bevorzugt werden. SiOx Es wurde berichtet, dass -basierte RRAM-Bausteine als Vermittler der Rolle der leitenden Brücken wirken, indem sie einfach Elektroden wie Cu und Ag mit hoher Diffusivität verwenden [44,45,46,47]. In einem anderen Fall wird die Speicherumschaltung durch den Valenzänderungseffekt innerhalb des SiOx . induziert Schicht, die durch die Erzeugung von Sauerstoffleerstellen oder das Protonenaustauschmodell erklärt werden kann [48,49,50,51,52,53,54,55]. Beim unipolaren Schalten, bei dem ein Setzvorgang einem Reset vorausgeht, ist es empfindlich gegenüber der Umgebungsatmosphäre. Die Schaltleistung in der Luft ist deutlich verschlechtert [48.49.50.51.52.53]. Andererseits zeigt das filamentäre Schalten ohne Rückwärtsscan-Effekte typisches unipolares und bipolares Schalten in verschiedenen SiOx -basierte RRAM-Geräte [52,53,54].
Hier präsentieren wir die Koexistenz von Schwellwertumschaltung und Speicherumschaltung in V/SiOx /AlOy /p ++ Si-Gerät abhängig von Compliance Current Limit (CCL). Die Vorrichtung mit der unteren Siliziumelektrode (BE) hat mehrere Vorteile gegenüber der herkömmlichen Metallelektrode. Das RRAM-Bauelement mit Speicher- oder Schwellenschaltung ist direkt mit der Source- oder Drain-Seite in einem Transistor verbunden, was eine potenzielle Anwendung für eingebettete Speicher und Bauelemente mit steiler Flanke ist. Der Überschwingstrom konnte aufgrund des Serienwiderstands von Si BE reduziert werden. Darüber hinaus können Nanospitzen aus Silizium BE durch Nassätzen und die Einstellung der Dotierungskonzentration in der Siliziumoberfläche die Schaltleistung verbessern. Die AlOy Schicht, die eine große Bandlücke mit einer isolierten Eigenschaft ist, hilft, den Betriebsstrom während der Schwellen- und Speicherumschaltung zu senken. Das SiOx Schicht fungiert als Speicherschaltschicht bei einer hohen CCL, während sie dazu dient, V TE bei niedriger CCL mit Sauerstoff zu versorgen, was ein Schwellenschalten ermöglicht.
Methoden
V/SiOx /AlOy /p ++ Si-Bauelement wurde wie folgt hergestellt:Erstens, BF2 Ionen wurden mit einer Beschleunigungsenergie von 40 keV und einer Dosis von 5 × 10 15 . implantiert cm −2 in ein Si-Substrat zu stark dotiertem Si BE. Der Gitterschaden wurde durch den Glühprozess bei 1050 °C für 10 Minuten ausgehärtet. Stark dotiertes Si BE hatte einen Schichtwiderstand von 30,4 Ω/□. Als nächstes wird ein 1,5 nm dickes AlOy Schicht wurde durch ein Atomlagenabscheidungssystem (ALD) unter Verwendung von H2 . abgeschieden O und Al (CH3 )3 und ein 5,5 nm dickes SiOx Schicht einer plasmaunterstützten chemischen Gasphasenabscheidung (PECVD) durch Reaktion von 5% SiH4 . unterzogen /N2 (160 sccm), N2 O (1300 sccm) und N2 (240 sccm) bei 300 °C. Anschließend wurde eine 50 nm dicke Vanadium(V)-Top-Elektrode (TE) mit einem Durchmesser von 100 μm durch DC-Sputtern eines V-Targets mit Ar-Gas (30 sccm) abgeschieden. Schließlich wurde ein 50 nm dickes Al als Schutzschicht durch DC-Sputtern abgeschieden, um eine weitere Oxidation von V TE zu verhindern. Alle elektrischen Eigenschaften wurden über die DC-Spannungs-Sweep- und Puls-Modi unter Verwendung eines Keithley 4200-SCS-Halbleiterparameteranalysators (SPA) bzw. eines 4225-PMU-Ultraschnellen Strom-Spannungs-(I-V)-Moduls bei Raumtemperatur charakterisiert. Für den Gerätebetrieb wurde das TiN-BE geerdet und die Ni-TE-Vorspannung wurde gesteuert.
Ergebnisse und Diskussion
Abbildung 1a zeigt die schematische Struktur von V/SiOx /AlOy /p ++ Si-Gerät. Drei amorphe V, SiOx , und AlOy Schichten und eine einkristalline Si-Schicht werden durch ein Transmissionselektronenmikroskopie-(TEM-)Querschnittsbild beobachtet, wie in Abb. 1b gezeigt. Die Dicken des SiOx und AlOy Schichten sind 5,5 bzw. 1,5 nm groß. Um das Zusammensetzungsverhältnis von zwei dielektrischen Filmen zu bestätigen, wurde eine XPS-Analyse durchgeführt (zusätzliche Datei 1). Das x Wert von SiOx und das y Wert von AlOy sind 0,88 bzw. 1,33. Unser SiOx Film mit PECVD im Vergleich zu SiO2 mittels Trockenoxidation abgeschieden wird bei einer viel niedrigeren Temperatur abgeschieden und weist viel mehr Defekte auf, was sie für das Widerstandsschalten bei relativ niedrigeren Spannungen geeignet macht. Abbildung 2a zeigt eine typische Schwellenschaltung von V/SiOx /AlOy /p ++ Si-Gerät. Das anfängliche Schalten mit einem positiven Formungsprozess erfordert eine höhere Spannung als das nachfolgende Schwellenschalten, da die dielektrischen Schichten anfänglich kleinere Defekte aufweisen. Ein CCL von 1 μA wird auf das Gerät angewendet, um die Bildung übermäßiger leitender Filamente im SiOx . zu vermeiden Schicht. Der Leckstrom ist sehr niedrig (100 pA bei 1 V) im Vergleich zu den zuvor gemeldeten Schwellenschaltungen von VOx . Dieser Vorteil wird dem Al2 . zugeschrieben O3 mit höherer Permittivität und Wärmeleitfähigkeit im Vergleich zu SiO2 . Der ausgeschaltete Zustand hat die isolierende Eigenschaft, da die Filamente leicht reißen und dann keine Filamente verbleiben. Ein möglicher Mechanismus für die Schwellenschaltung ist die Oxidation des V TE aus dem Sauerstoff, der vom SiOx . zugeführt wird Schicht während des Positivformprozesses, wie in Fig. 2b gezeigt. Die elektrische Eigenschaft von VOx zwischen V TE und SiOx Schicht kann sich vom isolierenden Zustand in den metallischen Zustand ändern, was zu einer plötzlichen Widerstandsänderung führt. Ein niedriger CCL von 1 μA reicht nicht aus, um effizient leitende Filamente im SiOx . zu erzeugen Film. Daher ist SiOx mit isolierenden Eigenschaften kann eine weitere Ursache für die Reduzierung des Abschaltstroms sein. Für einen negativen Umformprozess von V/SiOx /AlOy /p ++ Si-Gerät wird eine Schwellenwertumschaltung nicht beobachtet (siehe Zusätzliche Datei 1). Wenn die negative Vorspannung an das V TE angelegt wird, bewegt sich die Bewegung des Oxids in Richtung des Si BE, so dass das V TE nicht länger am Schwellenschalten teilnehmen kann, da VOx . Der Einschub von Fig. 2a zeigt die Schwellenspannung (Vth ) und Spannung halten (Vhold ) während der 100 Zyklen. Die Vte wobei der Strom steil mit nahezu unendlicher Steigung zwischen 1,08 und 1,82 V ansteigt und Vhold an diesem Punkt liegt die Stromrückkehr in einen hochohmigen Zustand zwischen 0,12 und 0,54 V. Abbildung 2c zeigt die I-V-Kennlinien im Einschaltstrom bei verschiedenen Temperaturen. Bei 25 °C und 55 °C zeigen sie eine fast ähnliche Schwellenschaltung, aber die I-V-Kurve bei einer höheren Temperatur von 85 °C verliert die Eigenschaft der Schwellenschaltung. Es ist bekannt, dass VOx verliert seinen MIT bei hohen Temperaturen. Somit ist dieses Ergebnis ein weiterer Beweis dafür, dass VOx ist die Hauptursache für die Schwellwertumschaltung. Abbildung 2d zeigt die transienten Eigenschaften für die Schwellenwertumschaltung. Der Impuls mit der Amplitude von 1 V überwacht den Lesestrom vor und nach dem Schreibimpuls mit einer Breite von 1 μs. Der hohe Strom wurde überwacht, während der Impuls mit hoher Amplitude an das Gerät angelegt wurde, und dann die V/SiOx /AlOy /p ++ Das Si-Gerät schaltete den Strom sofort ab, nachdem der Schreibimpuls entfernt wurde. Die oben analysierten Selektoreigenschaften können verwendet werden, wenn sie mit dem Betrieb von Speicherelementen unter 1 μA kombiniert werden [55, 56].
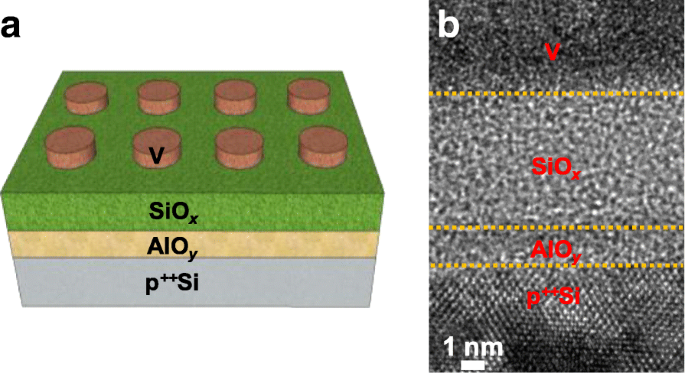
Gerätekonfiguration von V/SiOx /AlOy /p ++ Si. a Schemazeichnung und b TEM-Bild

Unidirektionale Schwellwertumschaltung von V/SiOx /AlOy /p ++ Si, wenn eine positive Umformung mit CCL von 1 μA angewendet wird. a Typische I-V-Kurven. b Schematische Darstellung des Umformprozesses. c I–V-Kennlinien durch Temperaturabhängigkeit. d Transiente Eigenschaften
Abbildung 3a zeigt das bipolare ohmsche Schalten von V/SiOx /AlOy /p ++ Si-Bauelement nach positiver Umformung mit CCL von 100 μA. Dann wird der Reset-Prozess mit einem schnellen Widerstandsanstieg durch Wobbeln der negativen Spannung durchgeführt, und die Vorrichtung wird in einen hochohmigen Zustand (HRS) geschaltet. Der Setzvorgang mit schnellem Widerstandsabfall erfolgt dann bei einer positiven Vorspannung, wodurch das Bauelement in einen niederohmigen Zustand (LRS) zurückkehrt. Um die Eigenschaften des leitenden Filaments zu verstehen, betrachten wir den normierten Leitwert und die Temperaturabhängigkeit. Die Leitung im LRS ist eine wichtige Richtlinie, um indirekt über die Eigenschaften des leitfähigen Filaments zu informieren. Abbildung 3b zeigt die normalisierte Leitfähigkeit (GN ), der als dynamischer Leitwert (Gd ) dividiere durch statische Leitfähigkeit (G0 .) ) für I–V-Kurven von V/SiOx /AlOy /p ++ Si-Gerät im LRS mit unterschiedlichen Temperaturen. Unabhängig von der Temperatur ist der GN Wert konvergiert gegen 1, wenn die Spannung Null ist. Dadurch können wir die bekannten Leitungsmechanismen wie Schottky-Emission, Fowler-Nordheim-Tunneling und das Child-Gesetz (I~V 2 ) im raumladungsbegrenzten Strom (SCLC). Eine metallische ohmsche Leitung kann auch unter Berücksichtigung der Temperaturabhängigkeit ausgeschlossen werden, wie in Abb. 3c gezeigt. Die Abnahme des Widerstands mit steigender Temperatur legt nahe, dass der leitende Faden halbleitende Eigenschaften hat. Somit können wir das Eindringen von V in das SiOx . ausschließen Schicht für den Hauptleiter aus V/SiOx /AlOy /p ++ Si-Gerät in LRS. Daher ist die bipolare Speicheroperation des V/SiOx /AlOy /p ++ Si-Gerät wird durch intrinsisches Schalten von SiOx . dominiert . Es wird auch bestätigt, dass die positiven und negativen Ströme nicht sehr unterschiedlich sind, was darauf hindeutet, dass sie eher als ein Grenzflächentyp wie die Schottky-Emission von Volumenleitung dominiert wird. Unter Berücksichtigung der oben erwähnten normalisierten Leitfähigkeit gibt es zwei mögliche massendominante Leitfähigkeitsmechanismen. Die erste ist die Sprungleitung nach der Formel:
$$ J={qnav}_o{e}^{-q{\o}_T/kT}{e}^{qaV/2 dkT} $$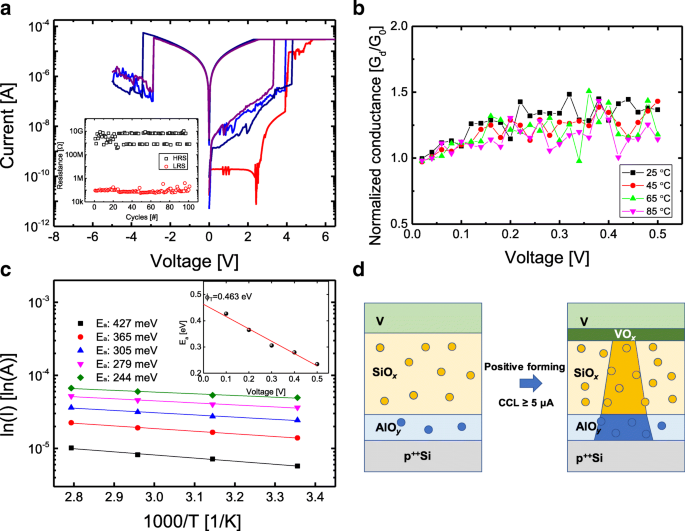
Speicherumschaltung von V/SiOx /AlOy /p ++ Si, wenn eine positive Umformung mit CCL von 30 μA angewendet wird. a Typische I-V-Kurven. b Normalisierte Leitfähigkeit. c In (I) gegenüber 1000/T. d Schematische Darstellung des Umformprozesses
wo q , n , a , ø T , v o , und d sind die elektrische Ladung, die Konzentration der Raumladung, der Mittelwert der Hüpfdistanz, die Höhe der Elektronenbarriere für das Hüpfen, die Eigenschwingungsfrequenz bzw. die Dicke des dielektrischen Films. Der ø T berechnet aus der Steigung einer linearen Auftragung von ln (I) gegen 1000/T beträgt 0,463 eV, wie in Abb. 3c gezeigt. Ein Wert, der aus der Beziehung zwischen Ea . berechnet wird und V ist 5,17 nm, was auf den im SiOx . gebildeten leitenden Faden hinweist ist nicht stark und liegt in der Nähe des HRS-Zustands. Der andere Leitungsmechanismus, die Poole-Frenkel(P-F)-Emission, wurde in Zusatzdatei 1 behandelt. Basierend auf den obigen Ergebnissen wurde das Modell des leitenden Filaments in der Speicheroperation von V/SiOx /AlOy /p ++ Das Si-Gerät ist in Fig. 3d dargestellt. Beim Positivformungsprozess lief der Oxidationsprozess auf der V TE-Seite ab, aber aufgrund des hohen CCL kann ein leitfähiges Filament innerhalb des SiOx . gebildet werden und AlOy aufgrund der Bewegung der Sauerstoffleerstellen. Während des Rücksetzvorgangs induziert das elektrische Feld, das der Formung und dem Aushärten entgegengesetzt ist, Sauerstoff und eine Rekombination mit der Sauerstoffleerstelle, was zum Bruch des leitenden Fadens führt. Es sei darauf hingewiesen, dass die Selektor- und Speicheroperationen in derselben Zelle beobachtet werden. Speicherbetrieb ist möglich, nachdem der Schwellenwertbetrieb aufgetreten ist und dann der Schalter vollständig ausgeschaltet ist. Die umgekehrte Richtung ist jedoch nicht möglich, da die Rücksetzschaltung des Speicherbetriebs nicht vollständig ausgeschaltet ist.
Abbildung 4a zeigt normalisierte I-V-Kurven im LRS von V/SiOx /AlOy /p ++ Si-Gerät im Niederspannungsbereich (0~1 V) für verschiedene CCL-Bedingungen (5 μA, 30 μA und 1 mA). Hier ist die normalisierte I-V-Kurve definiert als der Strom bei jeder Spannung geteilt durch den Strom bei 1 V. Da die Pegel des LRS-Stroms in Abhängigkeit von der CCL variieren, setzen wir den Stromwert auf 1 V, um die Nichtlinearität. Es kann beobachtet werden, dass mit abnehmendem CCL der Strom im niedrigeren Spannungsbereich unterdrückt wird. Um eine quantitativere Beziehung abzuleiten, wird die Nichtlinearität als das Verhältnis des Stroms bei VREAD . definiert dazu in der Hälfte von VREAD . Abbildung 4b zeigt den Lesestrom bei 1 V und die Nichtlinearität als Funktion des CCL für V/SiOx /AlOy /p ++ Si-Gerät. Die Abnahme des Lesestroms aufgrund der CCL-Reduktion deutet darauf hin, dass der leitende Faden feiner wird und dann die Nichtlinearität zunimmt. Der intrinsische Siliziumoxidfilm weist selbst in einer einzelnen Schicht eine hohe Nichtlinearität auf. Die intrinsische nichtlineare Eigenschaft ist eher auf die Volumennatur des Siliziumoxids als auf die Grenzfläche des Siliziums zurückzuführen. Je kleiner der CCL ist, desto weniger wird der Abbau im SiOx . erzeugt , so dass die Absenkung des Fallenenergieniveaus im LRS im Vergleich zu dem im HRS minimiert werden kann. Daher kann die höhere Energiebarriere die Nichtlinearität im LRS-Zustand maximieren, wenn eine niedrigere CCL auf die Vorrichtung angewendet wird. In ähnlicher Weise ist die durch die P-F-Emission beschriebene Leitung im TaOx /TiOy Stack sorgt für eine hohe Nichtlinearität [57]. Eine andere Möglichkeit besteht darin, dass, weil die Dielektrizitätskonstante des Oxids kleiner ist, aufgrund der Feldkonzentration mehr Durchgänge zum Oxidfilm erfolgen. Dies kann zu einer Verringerung des Fallenenergieniveaus der Oxidschicht führen, von der erwartet werden kann, dass sie als Tunnelbarriere für Al2 . dient O3 . Um den Leserand (∆V) in n . zu erhalten × n Cross-Point-Array verwenden wir das vereinfachte Ersatzschaltbild wie in Abb. 4c gezeigt. Im schlimmsten Fall werden die benachbarten Zellen auf den LRS und den Lastwiderstand (RL ) zum LRS-Widerstand. Die ∆V wurde aus der Differenz zwischen VOUT . berechnet an LRS und VOUT bei HRS. Abbildung 4d zeigt die ∆V als Funktion der Anzahl der Wortleitungen (n ) für V/SiOx /AlOy /p ++ Si-Gerät. Je kleiner die CCL, desto höher ist ∆V, da die Nichtlinearität zunimmt. Wenn eine Lesemarge von 10 % gesichert ist, kann das Array auf etwa mehr als 10 × 10 für eine CCL von 5 μA und auf 5 × 5 für eine CCL von 1 mA erweitert werden. Die Array-Größe, um dem Kriechstrom standzuhalten, ist nicht ausreichend, aber es hilft, die Array-Größe zu vergrößern, wenn das Gerät mit Selektorfunktion in einem V/SiOx . angeschlossen ist /AlOy /p ++ Si-Gerät. Im Vergleich zu 0,5-V-Lesen in allen CCLs weist es eine höhere Nichtlinearität beim Lesen bei 1 V auf. Obwohl niedrige VREAD führt zu einer geringen statischen Leistung beim Lesevorgang, der Wert der Nichtlinearität wird kleiner, was darauf zurückzuführen ist, dass das elektrische Feld auf dem SiOx . geringer ist /AlOy Schicht in kleinerem VREAD .

Nichtlineare Eigenschaften von V/SiOx /AlOy /p ++ Si für Speicherumschaltung. a I–V-Kurven mit unterschiedlichen CCLs. b Lesen Sie Strom und Nichtlinearität als Funktionen von CCL. c Äquivalente Schaltungen des Cross-Point-Arrays. d Lesemarge als Funktion der Wortleitungsnummer für verschiedene CCLs und Lesespannung
Schlussfolgerungen
In dieser Arbeit wird ein V/SiOx /AlOy /p ++ Es wird eine Si-Vorrichtung mit sowohl einer Selektor- als auch einer Speicherfunktion durch einfaches Steuern von CCL untersucht. Wenn ein CCL von 1 μA oder weniger angewendet wird, wird eine unidirektionale Schwellenwertumschaltung für die Selektoranwendung beobachtet. Positivformung oxidiert die V-Elektrode und das MIT-Phänomen von VOx kann eine Schwellwertumschaltung auslösen. Die AlOy Schicht erreicht eine hohe Selektivität von 10 4 durch Absenken des Ausschaltstroms. Wenn andererseits eine CCL von 5 μA oder mehr angewendet wird, wird eine Speicherumschaltung beobachtet, da auf dem SiOx . effektiv leitende Filamente gebildet werden Schicht. Je niedriger der CCL, desto größer die Nichtlinearität, was dazu beiträgt, die Größe des Cross-Point-Arrays zu erhöhen.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- BE:
-
Untere Elektrode
- CCL:
-
Einhaltung der Strombegrenzung
- CRS:
-
Komplementäres ohmsches Schalten
- DRAM:
-
Dynamischer Direktzugriffsspeicher
- HRS:
-
Hochohmiger Zustand
- I–V:
-
Strom–Spannung
- LRS:
-
Niederohmiger Zustand
- MIT:
-
Metall-Isolator-Übergang
- OTS:
-
Ovonic-Schwellenwertschaltung
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- P-F:
-
Poole-Frenkel
- RRAM:
-
Resistiver Direktzugriffsspeicher
- SCLC:
-
Raumladungsbegrenzter Strom
- SCM:
-
Speicherklasse Speicher
- SPA:
-
Halbleiterparameteranalysator
- SSD:
-
Solid-State-Laufwerk
- TE:
-
Top-Elektrode
- TEM:
-
Transmissionselektronenmikroskopie
- V:
-
Vanadium
Nanomaterialien
- Begriffe und Konzepte des digitalen Speichers
- Was ist ein Betriebssystem und seine Komponenten
- C++-Speicherverwaltung:neu und löschen
- Partitionsspeicher – Einführung und grundlegende Dienste
- Prozessoren befassen sich mit der Konvergenz von IoT und KI
- Doppelte Nichtlinearitätskontrolle von Moden- und Dispersionseigenschaften in graphen-dielektrischen plasmonischen Wellenleitern
- Eine gemeinsame Studie zur Modellierung und Simulation von resistivem Direktzugriffsspeicher
- IoT-Fertigung:Definition, Funktionen und Beispiele
- Slotter-Maschinenteile und ihre Funktionen
- Arten von Differentialen und ihre Funktionen



