Optische Leistung von Top-Down-gefertigten AlGaN-Nanostab-Arrays mit eingebetteten Multi-Quanten-Wells
Zusammenfassung
AlGaN-basierte Nanostab-Arrays (NR) im tiefen Ultraviolett wurden durch Nanoimprint-Lithographie und Top-Down-Trockenätztechniken aus einem vollstrukturierten LED-Wafer hergestellt. Hochgeordnete periodische Struktureigenschaften und Morphologie wurden durch Rasterelektronenmikroskopie und Transmissionselektronenmikroskopie bestätigt. Im Vergleich zu planaren Proben zeigte die Kathodolumineszenzmessung, dass NR-Proben eine 1,92-fache Verbesserung der Lichtextraktionseffizienz (LEE) und eine 12,2-fache Verbesserung der internen Quanteneffizienz (IQE) für die Emission aus Multi-Quanten-Wells bei ungefähr 277 nm aufwiesen. Die LEE-Verbesserung kann der gut hergestellten nanostrukturierten Grenzfläche zwischen der Luft und den Epischichten zugeschrieben werden. Darüber hinaus war der reduzierte stark quantenbegrenzte Effekt für die große Verbesserung des IQE verantwortlich.
Einführung
In den letzten zehn Jahren haben AlGaN-basierte UV-LEDs aufgrund ihrer vielversprechenden Anwendungen wie Wasserreinigung, Sterilisation und biochemische Detektion große Aufmerksamkeit auf sich gezogen. [1,2,3]. Im Vergleich zu herkömmlichen Quecksilber-UV-Lampen sind AlGaN-basierte UV-LEDs robust, kompakt und umweltfreundlich und können ohne Aufwärmschritt eingeschaltet werden. In den AlGaN-Multi-Quanten-Wells (MQWs) existiert jedoch ein starkes piezoelektrisches Feld, das zu einer räumlichen Trennung von Elektronen und Löchern führt, die als quantenbegrenzter starker Effekt (QCSE) bezeichnet wird und die interne Quanteneffizienz (IQE) dramatisch verringert [4] . Ein weiteres Problem ist die geringe Lichtextraktionseffizienz (LEE) [5], die nicht nur durch die interne Totalreflexion an der Grenzfläche der Epischichten verursacht wird, sondern auch durch das dominante transversal magnetisch (TM) polarisierte Licht [6]. Frühere Untersuchungen legten nahe, dass das Energieband-Engineering ein effektiver Weg ist, um den QCSE zu reduzieren und damit den IQE zu verbessern [7]. Auf der anderen Seite, die Grenzflächentechnik, wie der Einbau von Strukturen wie photonischen Kristallen [8, 9], strukturierten Substraten [10, 11], verteilten Bragg-Reflektoren [12] und Oberflächenplasmonen [13,14,15,16], kann den LEE der Deep-UV-LEDs verbessern. Die Kombination dieser Methoden ist jedoch relativ schwierig.
Die Herstellung von AlGaN-basierten nanostrukturierten Deep-UV-LEDs kann ein alternativer Weg sein, um gleichzeitig QCSE- und niedrige LEE-Probleme zu überwinden. Im Allgemeinen wurden nanostrukturierte LEDs durch Masken im Nanometerbereich und Top-Down-Trockenätztechniken hergestellt. Die Masken wurden über getemperte Metallnanopartikel wie Nickel (Ni) oder Gold [17, 18], Nanosphärenlithographie [19, 20, 21], Elektronenstrahllithographie (EBL) [22] und fokussiertes Ionenstrahlfräsen [23] hergestellt. . Inzwischen wurden mehrere selektive Flächenepitaxiemethoden entwickelt, um InGaN-basierte Nanodraht-LEDs zu erhalten [24, 25]. Jedes Verfahren hat jedoch seine eigenen natürlichen Nachteile, wie teure, unkontrollierbare Morphologie, ungleichmäßige, mit mikroelektronischen Prozessen nicht kompatibel und zeitaufwendig. Um diese Mängel zu überwinden, haben wir eine weiche UV-härtende Nanoimprint-Lithographie (NIL) entwickelt, um steuerbare Masken in einem sehr großen Bereich mit hoher Gleichmäßigkeit und geringer Defektdichte herzustellen [26, 27].
In dieser Arbeit haben wir erfolgreich AlGaN-Nanostab-(NR)-Arrays mit MQWs hergestellt, die aus planaren AlGaN-LED-Wafern eingebettet sind. Im Vergleich zu den planaren (PLA) Proben wurde eine 1,92-fache LEE-Verstärkung und eine 12,2-fache relative IQE-Verstärkung nachgewiesen. Messungen der Kathodolumineszenz (CL), Rasterelektronenmikroskopie (REM) und Transmissionselektronenmikroskopie (TEM) legten nahe, dass der verbesserte LEE auf die verbesserte Grenzflächenqualität zwischen der Luft und den Epischichten zurückzuführen ist. Die Raman-Messungen zeigten, dass die Belastung in den MQWs von 0,42 % auf 0,13 % reduziert wird, was für die Verbesserung des IQE von Vorteil ist.
Methoden
Der AlGaN-LED-Wafer wurde durch metall-organische chemische Gasphasenabscheidung (MOCVD) auf einem 2 Zoll gezüchtet. c ebenes Saphirsubstrat, das als PLA-Probe definiert ist. Die Epitaxie umfasste einen 900 nm undotierten AlN-Puffer, eine 400 nm abgestufte Al-Zusammensetzungs-AlGaN-Schicht, eine 1,4 µm dicke Si-dotierte n-Al0,5 Ga0,5 N und 5 Perioden von Al0,35 Ga0,65 N/Al0,45 Ga0,55 N MQWs mit einer Wannen- und Barrieredicke von 3 bzw. 10 nm, gefolgt von einer 100-nm Mg-dotierten p-GaN-Kontaktschicht.
Ein weiches UV-härtendes NIL und ein Ätzansatz nach dem Wachstum wurden verwendet, um die AlGaN-NR-Arrays zu erhalten [26, 27, 28]. Wie in Abb. 1a–h gezeigt, begann der NIL-Prozess mit einer Abscheidung von 200 nm dickem Siliziumdioxid (SiO2 ) unter Verwendung der plasmaunterstützten chemischen Gasphasenabscheidung (PECVD) (Abb. 1b). Dann wurden eine Schicht aus 300 nm dickem SU8-Fotolack und eine Schicht aus 80 nm dickem UV-härtbarem Fotolack direkt auf die Epischicht aufgeschleudert (Abb. 1c), mit NIL nach der weichen UV-Härtung auf dem UV-härtbaren Fotolack (Abb. 1d). Um die UV-Resistreste zu entfernen und die Nanomuster auf die SU8-Fotolackschicht zu duplizieren, Sauerstoff (O2 ) wurde Plasma verwendet, um den SU8-Fotolack über ein reaktives Ionenätzverfahren (RIE) zu ätzen (Abb. 1e). Danach wurde eine 30 nm dicke Ni-Schicht durch physikalische Gasphasenabscheidung (PVD) abgeschieden, und es folgte ein Lift-Off-Prozess, um periodische Ni-Inseln auf der Oberfläche von SiO2 . zu bilden Schicht, die als Hartmaske diente (Abb. 1f). Die vorbereitete Ni-Hartmaske wurde verwendet, um die Muster auf SiO2 . zu übertragen Schicht durch einen anderen RIE-Prozess (Abb. 1g). Anschließend werden diese SiO2 Nanostab-Arrays wurden als zweite Maske verwendet, um den AlGaN-LED-Wafer über einen Ätzprozess mit induktiv gekoppeltem Plasma (ICP) zu ätzen. Schließlich sind diese SiO2 Nanostab-Array-Masken wurden durch HF-Lösung entfernt und AlGaN-NR-Arrays wurden wie in Abb. 1h dargestellt aufgenommen. Die Ausbeute an Nanostrukturen mit dieser NIL-Technologie beträgt über 98% auf 2 in.-Wafern, was mit der EBL-Methode vergleichbar ist, aber die NIL-Technologie ist viel billiger. Die Details konnten unserem vorherigen Bericht [27] entnommen werden. Es ist unvermeidlich, während des Trockenätzens Oberflächenzustände an der Seitenwand der Nanostäbe zu erzeugen, die als strahlungsfreie Rekombinationszentren dienen und die Lumineszenz von AlGaN-MQWs unterdrücken können. Daher wurden alle NR-Proben einer chemischen Behandlung unter Verwendung von KOH und einer verdünnten Säurelösung bei 90°C im Wasserbad unterzogen, um die Oberflächenzustände zu entfernen.
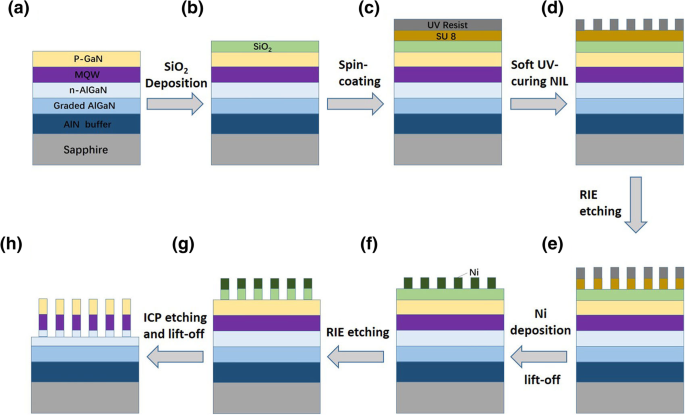
Schema der Herstellung von AlGaN-NR-Arrays mit eingebetteten MQWs. a Originaler AlGaN-basierter Deep-UV-LED-Wafer. b SiO2 Ablage. c Spin-Coating-Prozess des SU8-Photoresists und des UV-härtbaren Resists. d Weiches UV-härtendes NIL-Verfahren. e RIE-Prozess von SU8-Photoresist. f Ni-Abscheidung und Lift-Off-Prozess in Aceton. g Ni-Muster auf SiO2 . übertragen Schicht nach RIE. h Muster von SiO2 . übertragen auf AlGaN-basierte LED-Wafer von ICP
Die Morphologie der hergestellten AlGaN-NR-Arrays wurde in einem hochauflösenden Feldemissions-REM-System von ZEISS SIGMA charakterisiert. TEM-Bilder wurden mit dem FEI Titan 80-300 TEM-System mit Elektronenstrahl bei 200 kV aufgenommen. Die CL-Spektren wurden mit einem Elektronenstrahl-Faser-Sondensystem gesammelt, wobei der Elektronenstrahl bei 10 kV und 922 pA arbeitete. Die Spektren der Raman-Streuung wurden in einem konfokalen Raman-Spektroskopie-Bildgebungssystem (WITec alpha 300RA) mit Rückstreukonfiguration unter Verwendung eines 514-nm-Lasers als Anregungsquelle erhalten. Die Raman-Messung wurde durch eine Standard-Einkristall-Siliziumprobe mit optischem Phononenmodus bei 520,7 cm −1 . kalibriert .
Ergebnisse und Diskussion
Abbildung 2 a, Einschub in a, und b zeigen die typische Draufsicht, betitelte und Querschnitts-REM-Aufnahmen der hergestellten AlGaN-NR-Arrays mit guter Gleichmäßigkeit und glatten Seitenwänden. Man sieht, dass die NR in einer hochgeordneten hexagonalen Anordnung vorliegen. Durchmesser, Periode und Länge der NRs betragen ungefähr 350 nm, 730 nm bzw. 1300 nm. Wie in Abb. 2 c und d gezeigt, können die in den NR eingebetteten MQWs nach der NR-Herstellung deutlich beobachtet werden. Der Brunnen und die Barriere werden als dunkle bzw. helle Bereiche dargestellt, und die Schnittstelle ist immer noch lesbar, flach und steil.

Die Draufsicht (a ), betitelt (Einschub in a) und Querschnitt (b ) REM-Aufnahmen der AlGaN-NR-Arrays. c , d die TEM-Bilder einzelner NR- bzw. AlGaN-MQWs
Abbildung 3 a und b zeigen die CL-Spektren von NR-Proben bei Raumtemperatur (RT; 300 K) und Tieftemperatur (LT; 10 K). Abbildung 3 c und d zeigen die RT- bzw. LT-CL-Spektren der PLA-Proben. Die durchgezogenen Linien und gestrichelten Linien sind experimentelle und angepasste Kurven (Gaussian). Gauß'sche Anpassung zeigt an, dass alle Spektren aus zwei Emissionspeaks bestehen. Unabhängig von der PLA- oder NR-Probe zeigen die bei LT gemessenen CL-Lumineszenzintensitäten eine starke Verbesserung im Vergleich zu denen bei RT. Dies kann auf die schwache thermische Aktivierungsenergie bei LT zurückgeführt werden. Somit können die Träger nicht zu Defekten wandern, an denen Träger strahlungsfrei rekombiniert werden können, was bedeutet, dass die Träger nur Strahlungsrekombination durchführen und der IQE als ungefähr 100 % angesehen werden kann. Unter Berücksichtigung der Struktur der Epitaxieschicht werden die Peaks bei kurzen (Peak 1) und langen (Peak 2) Wellenlängen den Emissionen der n-Schicht bzw. der MQW zugeschrieben. Die detaillierten Parameter, die aus den Gaussian geteilten Peaks erhalten wurden, sind in Tabelle 1 aufgeführt. Für die NR-Probe betragen die integrierten Emissionsintensitäten aus der n-Schicht ungefähr 2,89 [I 1 (NR300K)/Ich 1 (PLA300K)] und 2,78 [I 1 (NR10K)/Ich 1 (PLA10K)] mal höher als für die PLA-Probe bei RT bzw. LT. Bei RT beträgt die integrierte Intensität der Emission des MQW für die NR-Probe jedoch ungefähr 5,81 [I 2 (NR300K)/Ich 2 (PLA300K)] mal höher als das der PLA-Probe, während das Verhältnis nur 0,48 beträgt [I 2 (NR10K)/Ich 2 (PLA10K)] bei LT.

a , b CL-Spektren von NR-Proben bei 300 K bzw. 10 K, angeregt durch einen Elektronenstrahl (10 kV, 992 pA). c , d CL-Spektren von PLA-Proben bei 300 bzw. 10 K, angeregt durch einen Elektronenstrahl (10 kV, 992 pA). Die durchgezogenen Linien und gestrichelten Linien entsprechen der experimentellen und der Gaußschen Anpassungskurve
Im Vergleich zur PLA-Probe sind die Seitenwände der NR-Probe der Luft ausgesetzt, wie in Fig. 4a gezeigt, was zu einer signifikanten Zunahme der gesamten Grenzfläche zwischen der Luft und der Epischicht führt. Somit kann der LEE sowohl für n-Schicht- als auch für MQW-Emissionen verbessert werden. Die LEE-Verstärkung der n-Schicht-Emission kann auf ungefähr 2,8 [I 1 (NR)/Ich 1 (PLA)]. Darüber hinaus ist gemäß der aus Fig. 2a erhaltenen geometrischen Struktur die MQW-Fläche der PLA-Probe ungefähr viermal größer als die der NR-Proben. Unter der Annahme der IQEs für PLA- und NR-Proben von 1 bei 10 K kann die relative Lichtextraktionsverstärkung zu ungefähr 1,9 [4 × I . erhalten werden 2 (NR10K)/Ich 2 (PLA10K)]. Offensichtlich ist die LEE-Verstärkung der n-Schicht-Emission höher als die der MQW-Emission.
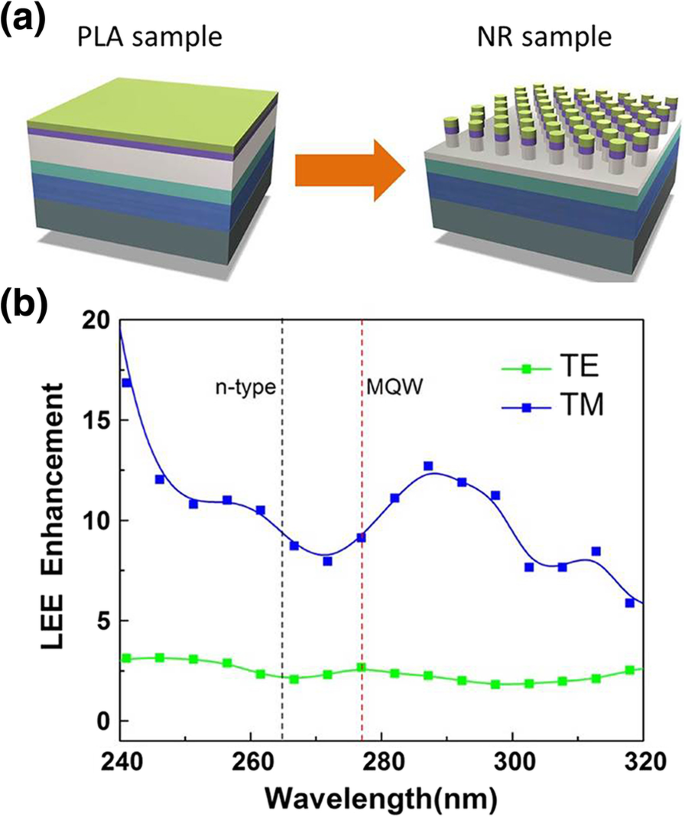
a Das Strukturdiagramm der PLA- und NR-Probe. b Die LEE-Verbesserung der NR-Probe im Vergleich zur PLA-Probe bei TE- und TM-Polarisationszustand, berechnet durch FDTD-Simulation. Die schwarzen und roten gestrichelten Linien entsprechen der Emissionswellenlänge der n-Typ-AlGaN-Schicht bzw. der AlGaN-MQWs
Finite-Differenz-Zeitbereichssimulationen (FDTD) wurden durchgeführt, um die LEE-Verbesserung von AlGaN-NR-Arrays zu klären. Der Durchmesser, die Periode und die Länge der NR-Arrays werden auf 350 nm, 730 nm bzw. 1300 nm eingestellt, um den hergestellten NR-Arrays zu entsprechen, wie in Fig. 4a dargestellt. Andere Simulationsparameter ähneln unserem vorherigen Bericht [29]. Das vom Monitor gesammelte Feld wurde verwendet, um die Leistung P0 . zu integrieren die von der oberen Oberfläche entweichen, und die Quellleistung des Dipols ist definiert als PS , also ist der LEE η = P 0 /P S . Und die Extraktionsverstärkung kann durch E . berechnet werden n = η r /η p , wobei η p , η r ist der LEE von PLA- bzw. NR-Abtastwerten. Abbildung 4b zeigt die Verbesserung der Lichtextraktion der NR-Arrays im Vergleich zu einer PLA-Probe bei transversalen elektrischen (TE) und TM-Polarisationszuständen. Man kann sehen, dass für die n-Schichtemission bei ungefähr 265 nm die LEE-Anreicherungsverhältnisse ungefähr 2,4 bzw. 9,2 für die TE- bzw. TM-Polarisationszustände betragen. Frühere Untersuchungen zeigten, dass selbst bei kompressiv gewachsenen AlGaN-MQWs eine stark TE-polarisierte Emission bei Wellenlängen von nur 240 nm beobachtet werden kann [30]. Daher ist es vernünftig, dass die LEE-Verstärkung einer Mischung aus TE- und TM-Zuständen ungefähr 2,8 beträgt. Jedoch betragen die LEE-Anreicherungsverhältnisse ungefähr 2,6 bzw. 9,1 für den TE- bzw. TM-Polarisationszustand bei ungefähr 277 nm. Das berechnete LEE-Verstärkungsverhältnis der MQW-Emission aus den experimentellen Daten beträgt ungefähr 1,9, was kleiner ist als das simulierte LEE-Verstärkungsverhältnis sowohl der TE- als auch der TM-Polarisationszustände. Dies kann auf die teilweise unregelmäßige Form der experimentell hergestellten NR-Arrays, die in Abb. 2a gezeigt sind, oder auf die Wiederaufnahme der beschädigten Schicht durch den NIL-Prozess zurückgeführt werden.
Andererseits kann die reduzierte QCSE den IQE für die NR-Probe für die MQW-Emission verbessern. Die IQEs der n-Schicht-Emission bei 300 K können auf ungefähr 1,96% [I 1 (PLA300K)/Ich 1 (PLA10K)] und 2,03 % [I 1 (NR300K)/Ich 1 (NR10K)] für die PLA- bzw. NR-Proben. Sie liegen sehr nahe beieinander, da die QCSE in der n-Typ-Schicht nicht existiert. Die IQEs der MQW-Emission bei 300 K betragen jedoch ungefähr 1,32% [I 2 (PLA300K)/Ich 2 (PLA10K)] und 16,1 % [I 2 (NR300K)/Ich 2 (NR10K)] für die PLA- bzw. NR-Proben. Somit beträgt das Verbesserungsverhältnis von IQE 12,2 für die MQW-Emission der NR-Probe verglichen mit der PLA-Probe. Diese starke Verbesserung des relativen IQE sollte dem reduzierten QCSE der NR-Probe zugeschrieben werden. Nach einigen ähnlichen Arbeiten zu blau/grünen LEDs [27, 31] verringert eine große Dehnungsrelaxation aufgrund der NR-Herstellung den QCSE-Effekt. Die reduzierte QCSE erhöht die Wellenfunktionsüberlappung von Elektronen und Löchern und führt zu einem erhöhten IQE.
Eine Raman-Messung wurde durchgeführt, um die Spannungsrelaxation in den NR-Proben zu bestätigen. Abbildung 5 zeigt die Raman-Spektren der PLA- und NR-Proben. Das E 2 Der (hohe) Phononenmodus wird normalerweise verwendet, um den Spannungszustand in den epitaktischen Schichten zu charakterisieren. Insbesondere drei E 2 (hohe) Phononenmoden werden in den Raman-Spektren sowohl für PLA- als auch für NR-Proben gezeigt, entsprechend der GaN-Kontaktschicht, der n-Typ-Schicht und der AlN-Pufferschicht. Offensichtlich sind die Peakverschiebungen von PLA- und NR-Proben anders als bei spannungsfreien E 2 (hohe) Phononenmoden, was darauf hinweist, dass sich der Spannungszustand geändert hat, nachdem die PLA-Probe in die NR-Probe verarbeitet wurde. Normalerweise wird die Spannung in der Ebene der Epitaxieschichten durch die folgende Gleichung [29] ausgedrückt:
$$ {\omega}_{{\textrm{E}}_2\left(\textrm{high}\right)}-{\omega}_0=C\sigma, $$ (1)wobei C die Spannungsverschiebungsrate ist (− 3.4 cm −1 /GPa, − 3.1 cm −1 /GPa und − 3,25 cm −1 /GPa für GaN, AlN und Al0,5 Ga0,5 N) [29]. \( {\omega}_{{\textrm{E}}_2\left(\textrm{high}\right)}\) und ω 0 sind die Raman-Verschiebungen für das E 2 (hohe) Mode der entsprechenden epitaktischen Schichten in unserer Studie bzw. der spannungsfreien Materialien. Die ω 0 Werte für GaN und Al0,5 Ga0,5 N wird mit 567,0 und 586,0 cm −1 . angegeben bei RT bzw. [32]. Die Dehnung der Epitaxieschichten kann ausgedrückt werden als [33]:
$$ {\sigma}_{\mathrm{xx}}=\left[{C}_{11}+{C}_{12}-2\frac{C_{13}^2}{C_{33} }\right]{\varepsilon}_{\mathrm{xx}}, $$ (2)wo σ xx ist die Spannung in der Ebene; ε xx die Dehnung in der Ebene ist und C ij sind die elastischen Konstanten von GaN und AlN, die im vorherigen Bericht [34] angegeben wurden, d. h. ein Proportionalitätsfaktor von 478,5 GPa für GaN und 474,5 GPa für Al0,5 Ga0,5 N.
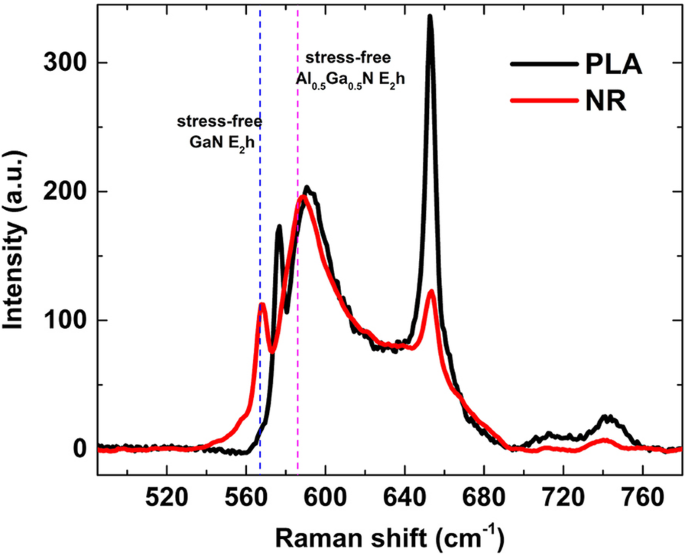
Raman-Spektren der PLA- und NR-Proben, stimuliert durch einen 514-Laser bei RT. Die schwarzen und roten Kurven repräsentieren PLA- bzw. NR-Abtastwerte. Die blauen und rosa gestrichelten Linien entsprechen E 2 h-Peak von unbelastetem GaN und Al0,5 Ga0,5 N bzw.
Unter Verwendung von Gl. (1, 2), Raman-Verschiebung, Spannung und Dehnung sind in Tabelle 2 aufgeführt. Insbesondere ist die Dehnung in der GaN-Kontaktschicht stark reduziert. Durch einfaches Berücksichtigen einer linearen Interpolation der Dehnung und Spannung in den verschiedenen Epischichten mit Al-Gehalt kann die Spannung/Dehnung in den MQWs mit 35 % Al-Gehalt zu 1,99 GPa/0,42 % und 0,59 GPa/0,13 % für PLA und NR . erhalten werden Probe bzw. Somit wurde eine Dehnung von 69 % in der MQWs-Schicht der NR-Probe entspannt.
Nach früheren Untersuchungen [35] ist das Polarisationsfeld E w in den Quantentöpfen kann ausgedrückt werden als
$$ {E}_{\mathrm{w}}=\frac{l_{\mathrm{b}}\left({P}_{\mathrm{b}}-{P}_{\mathrm{w} }\right)}{l_{\mathrm{w}}{\upvarepsilon}_{\mathrm{b}}+{l}_{\mathrm{b}}{\upvarepsilon}_{\mathrm{w}} }, $$ (3)wo l w , l b , P w , P b , und ε b , ε w sind die Breiten, Gesamtpolarisationen und Dielektrizitätskonstanten der Wannen bzw. der Barrieren. Somit sollte nicht nur die piezoelektrische Polarisation, sondern auch die spontane Polarisation berücksichtigt werden. Die piezoelektrische Polarisation wird berechnet durch \({P}_{\mathrm{pz}}=2\left({e}_{31}-{e}_{33}\frac{C_{13}}{C_{ 33}}\right){\varepsilon}_{\mathrm{xx}} \) [36], wobei e 31 , e 33 , C 31 , und C 33 erhält man durch lineare Interpolation aus den zugehörigen Parametern von GaN und AlN [37, 38], die Dehnung ε xx wird durch die Raman-Spektren unter Verwendung der linearen Interpolationsmethode berechnet. Die spontane Polarisation wird durch die lineare Interpolation aus der spontanen Polarisation von GaN und AlN erhalten [37, 39]. Unter Verwendung der Dielektrizitätskonstante der Wannen und der Barrieren, die durch die lineare Interpolation aus der Dielektrizitätskonstante von GaN ε GaN = 8,9 und AlN ε AlN = 8.5 [40] kann das Polarisationsfeld nach Gl. (3). Tabelle 3 listet die spontane Polarisation, piezoelektrische Polarisation, Gesamtpolarisation und das Polarisationsfeld in den Quantentöpfen für PLA- und NR-Proben auf; man kann deutlich sehen, dass das Polarisationsfeld nach der NR-Herstellung reduziert wird.
Schlussfolgerung
Zusammenfassend lässt sich sagen, dass hochgradig einheitliche AlGaN-NR-Arrays mit eingebetteten MQWs erfolgreich durch NIL- und Top-Down-Ätztechniken hergestellt wurden. Zwei Peaks, die der Emission von der n-Typ-Schicht (bei höherer Energie) und MQWs (bei niedrigerer Energie) entsprechen, werden durch die CL-Messung sowohl für NR- als auch PLA-Proben bei 300 K und 10 K beobachtet , wurde eine über 2-fache LEE-Verstärkung beobachtet, während der IQE über die NR-Herstellung kaum verbessert wird. Für die MQW-Emission kann das LEE-Verstärkungsverhältnis auf etwa 1,9 geschätzt werden und es wird eine 12,2-fache IQE-Verbesserung erreicht. Raman-Spektren zeigten, dass die Dehnung durch die NR-Herstellung von 0,42 % auf 0,13 % reduziert wurde, was einen starken Hinweis auf eine verringerte QCSE zeigt. Unsere Ergebnisse zeigten, dass bei Proben ohne große Kristallqualität die durch die QCSE verursachte räumliche Trennung zwischen den Elektronen und den Löchern ein wichtiger Faktor für die IQE-Reduktion wäre.
Abkürzungen
- CL:
-
Kathodolumineszenz
- EBL:
-
Elektronenstrahllithographie
- FDTD:
-
Zeitbereich mit endlicher Differenz
- ICP:
-
Induktiv gekoppeltes Plasma
- LEE:
-
Lichtextraktionseffizienz
- LT:
-
Niedrige Temperatur
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- MQWs:
-
Multi-Quanten-Wells
- Ni:
-
Nickel
- NIL:
-
Nanoimprint-Lithographie
- NR:
-
Nanostab
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- PLA:
-
Planar
- PVD:
-
Physikalische Gasphasenabscheidung
- QCSE:
-
Quantenbegrenzter starker Effekt
- RIE:
-
Reaktives Ionenätzen
- RT:
-
Raumtemperatur
- SEM:
-
Rasterelektronenmikroskopie
- TE:
-
Quer elektrisch
- TEM:
-
Transmissionselektronenmikroskopie
- TM:
-
Quermagnetisch
- UV:
-
Ultraviolett
Nanomaterialien
- Tipps zur eingebetteten Firmware:So initialisieren Sie Arrays in C mit Signalwellenformen und anderen Dateidaten
- NiCo2S4@NiMoO4-Kern-Schale-Heterostruktur-Nanoröhren-Arrays, die auf Ni-Schaum als binderfreie Elektrode gewachsen waren, zeigten eine hohe elektrochemische Leistung mit hoher Kapazität
- Tauchbeschichtungsverfahren und Leistungsoptimierung für elektrochrome Drei-Zustands-Bauelemente
- Au-beschichtete GaAs-Nanopillar-Arrays, hergestellt durch metallunterstütztes chemisches Ätzen
- Ein neuartiger Bi4Ti3O12/Ag3PO4-Heteroübergang-Photokatalysator mit verbesserter photokatalytischer Leistung
- TiO2-Nanoröhren-Arrays:Hergestellt durch weiche-harte Schablone und die Korngrößenabhängigkeit der Feldemissionsleistung
- Konische Quantenkaskaden-Laser-Arrays, die in Talbot-Kavitäten integriert sind
- Herstellung optischer Schaltmuster mit strukturellen farbigen Mikrofasern
- Einfache Synthese zweidimensionaler Ruddlesden-Popper-Perowskit-Quantenpunkte mit fein einstellbaren optischen Eigenschaften
- Photovoltaische Leistung von Pin-Junction-Nanokonus-Array-Solarzellen mit verbesserter effektiver optischer Absorption



