Überblick über die jüngsten Fortschritte bei vertikalen PN-Dioden auf GaN-Basis
Zusammenfassung
Als repräsentatives Halbleitermaterial mit großer Bandlücke hat Galliumnitrid (GaN) aufgrund seiner überlegenen Materialeigenschaften (z. B. hohe Elektronenbeweglichkeit, hohe Elektronensättigungsgeschwindigkeit und kritisches elektrisches Feld) zunehmende Aufmerksamkeit auf sich gezogen. Vertikale GaN-Bauelemente wurden untersucht, gelten als einer der vielversprechendsten Kandidaten für Anwendungen in der Leistungselektronik und zeichnen sich durch die Fähigkeit für Hochspannung, Hochstrom und hohe Durchbruchspannung aus. Unter diesen Geräten wurde die vertikale GaN-basierte PN-Übergangsdiode (PND) eingehend untersucht und zeigt einen großen Leistungsfortschritt auf der Grundlage einer hohen Epitaxiequalität und eines Gerätestrukturdesigns. Die Qualität der Geräteepitaxie erfordert jedoch eine weitere Verbesserung. Im Hinblick auf die elektrische Leistung des Geräts ist der Verdrängungseffekt des elektrischen Felds am Geräterand ein dringendes Problem, das zu einem vorzeitigen Zusammenbruch führt und die Freisetzungsüberlegenheit des GaN-Materials begrenzt, aber derzeit durch den Randabschluss gemildert wird. Dieser Aufsatz hebt die Fortschritte bei epitaktischen Materialwachstums- und Edge-Terminal-Techniken hervor, gefolgt von der Untersuchung der aktuellen GaN-Entwicklungen und der potenziellen Vorteile gegenüber Silizium-Kohlenstoff (SiC) für Materialien und Bauelementen, den Unterschieden zwischen GaN-Schottky-Dioden (SBDs) und PNDs sowie in Bezug auf Mechanismen und Merkmale und die Vorteile vertikaler Geräte gegenüber ihren seitlichen Gegenstücken. Anschließend bietet die Überprüfung einen Ausblick und zeigt den Designtrend des vertikalen GaN-PND auf, der für ein Stromversorgungssystem verwendet wird, einschließlich eines inchoate vertikalen GaN-PND.
Einführung
Der weltweite Energieverbrauch steigt aufgrund des rasanten Wachstums von Industrie und Wirtschaft deutlich schneller als in den letzten Jahrzehnten. Daher sind fortschrittliche energiesparende Technologien erforderlich, um die Probleme des steigenden Energieverbrauchs zu lindern.
Geräte auf Siliziumbasis sind derzeit der dominierende Typ unter den Leistungsgeräten [1]. Unter diesen Leistungsbauelementen spielen die Bipolartransistorstrukturen mit isoliertem Gate (IGBTs) eine bedeutende Rolle und zeigen seit der Erfindung des IGBTs im Jahr 1982 [2]. Gegenwärtig sind IGBTs wesentliche Elemente der leistungselektronischen Felder für die Umwandlung und Übertragung [3]. Allerdings haben siliziumbasierte Leistungsbauelemente bis heute ihre grundlegenden Materialgrenzen erreicht und werden in großem Umfang in elektrischen Energieanwendungen eingesetzt.
Aufgrund seiner hervorragenden Eigenschaften ist GaN eines der Halbleitermaterialien mit großer Bandlücke (einschließlich SiC, GaN, Ga2 O3 und Diamant), die in der Lage sind, Leistungsbauelemente mit niedriger Kapazität und geringem Widerstand für eine spezifizierte Durchbruchspannung in Bezug auf die Bauelemente auf Si-Basis herzustellen. Daher werden GaN-basierte Bauelemente mit niedrigem Energieverbrauch, hohen Leistungsdichten und hohem Umwandlungswirkungsgrad für leistungselektronische Systeme erwartet.
Wie in Tabelle 1 gezeigt, hat GaN eine viel höhere Baliga-Leistungszahl (BFOM) als SiC (das kommerzialisiert wurde), eine Eigenschaft, die auf seine höhere Elektronensättigungsgeschwindigkeit und sein höheres kritisches elektrisches Feld zurückgeführt wird. SiC hat jedoch eine bessere Wärmeleitfähigkeit. Außerdem besitzt GaN eine höhere Ladungsträgermobilität µ und eine höhere Wärmeleitfähigkeit und erreichten sowohl p - und n -Dotierung im Vergleich zu Ga2 O3 . In der Zwischenzeit müssen für den ultimativen Halbleiter mit großer Bandlücke, Diamant, beträchtliche Fortschritte erzielt werden, um das praktische Stadium zu erreichen. Bis heute sind GaN-basierte Bauelemente, z. B. dreipolige Bauelemente (Heterostruktur-Feldeffekttransistoren (HFETs) und MOSFETs) und zweipolige Bauelemente (SBDs und PNDs) zu zentralen Forschungsthemen geworden, bei denen große Fortschritte erzielt wurden Anwendungen in der Leistungsgleichrichtung und Leistungsumwandlung.
GaN versus SiC
Aufgrund seiner inhärenten Materialeigenschaften hat GaN gegenüber SiC leicht überlegene Vorteile, darunter eine größere Energiebandlücke, ein höheres kritisches elektrisches Feld, eine höhere Elektronensättigungsgeschwindigkeit und eine 3–4x bessere BFOM für Leistungsbauelemente [6]. Daher sollten GaN-basierte Bauelemente in Anbetracht ihrer herausragenden Eigenschaften SiC-basierte Gegenstücke übertreffen. In der praktischen Anwendung sind vertikale GaN-basierte Bauelemente aufgrund ihrer hervorragenden Materialeigenschaften für eine hohe Leistungsdichte und hohe Betriebsfrequenz unerlässlich (Abb. 1).
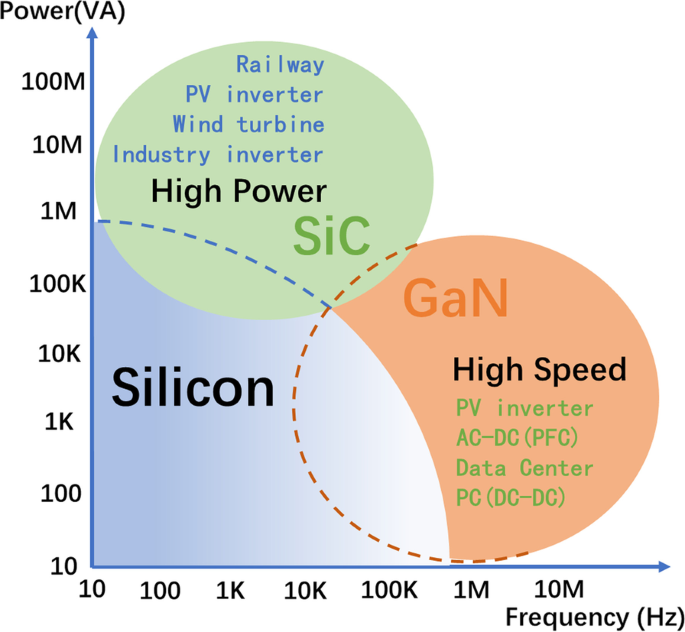
Mögliche Anwendungen von GaN- und SiC-Leistungsschalttransistoren [7]
Als die ausgereiftesten Wide-Gap-Halbleiter haben SiC-Bauelemente in den letzten zehn Jahren bemerkenswerte Fortschritte erzielt und zeigen eine vielversprechende Leistung in Bezug auf hohe Spannung, niedrigen spezifischen Einschaltwiderstand und schnelle Schaltgeschwindigkeit [8]. Aufgrund der fundierten Forschungsgrundlagen seit 1980 und der verfügbaren größeren SiC-Substrate mit geringem Defekt (< 10 4 cm −2 ). Leistung [9].
Im Vergleich zu SiC entwickelten sich GaN-Bauelemente sehr langsam. Ihre unbefriedigende Materialqualität verhindert die Realisierung einiger ihrer theoretisch überlegenen Eigenschaften. Angesichts des Fehlens des GaN-Substrats basieren die meisten Studien zu GaN-Bauelementen in diesem Stadium hauptsächlich auf der lateralen Struktur (z. B. AlGaN/GaN-Heterostruktur). Mit seiner höheren Elektronenbeweglichkeit von 2000 cm 2 /V s (zweidimensionales Elektronengas (2DEG) in AlGaN/GaN), 1000 cm 2 /V s (Bulk-GaN) und höhere Sättigungsgeschwindigkeit von 2,5 × 10 7 cm/s im Vergleich zu SiC-Gegenstücken werden AlGaN/GaN-Bauelemente für Hochfrequenzanwendungen bevorzugt und haben im Vergleich zu SiC-Bauelementen eine niedrige Wattleistung [10]. Bei Hochfrequenzfeldern erreichen AlGaN/GaN-SBDs ausgezeichnete elektrische Transportleistungen und sind besser geeignet für Mikrowellen- und Millimeterwellenanwendungen im Wattbereich [11, 12]. Die AlGaN/GaN-SBD ist ein repräsentatives Gerät für GaN-SBDs. Die hohe Mobilität von 2DEG bedeutet, dass AlGaN/GaN-SBDs enorme Leistungsvorteile bei Hochfrequenzanwendungen im Vergleich zu vertikalen SBDs aufweisen und auch eine niedrige Einschaltspannung beibehalten. Kürzlich waren AlGaN/GaN-SBDs die Basis für eine 5,8-GHz-Gleichrichterschaltung mit einer Eingangsleistung von 6,4 W und einer Einschaltspannung von 0,38 V mit einer Durchbruchspannung (BV ) von 3000 V [13, 14]. Die maximale Grenzfrequenz liegt nahe 1 THz bei 0 V mit einem Anoden-Kathoden-Abstand von 70 nm [15].
Für GaN-basierte Leistungsbauelemente ist das GaN-Substrat (Bulk-GaN) ideal für das Epitaxiewachstum, das die Homo-Epitaxie-Technologie nutzen könnte, um die Fehlanpassung zu beseitigen. Die niedrige Versetzungsdichte von Bulk-GaN ist für das Epitaxiesubstrat von wesentlicher Bedeutung, da die hohe Versetzungsdichte Leistungsmerkmale wie BV . beeinflussen kann , Sperrleckstrom, Produktionsvolumen und Zuverlässigkeit [16]. Die Entwicklung vertikaler GaN-basierter Bauelemente wurde in den letzten Jahren durch den Fortschritt des GaN-Substrats vorangetrieben. Angesichts der relativ unausgereiften Technologie für die vertikale Triode ist die vertikale GaN-Diode jedoch in dieser Anfangsphase zu einem heißen Forschungsthema geworden. Im Vergleich zu AlGaN/GaN-SBDs haben vertikale GaN-SBDs ähnliche Vorteile bei Frequenzfeldern, wie z. B. hohe Schaltgeschwindigkeit mit geringer Sperrverzögerungszeit und geringem Leitungsverlust; dennoch hat letzteres eine hohe Stromdichte und weniger Kriechwege als ersteres [17, 18].
Für das GaN-Substrat sind einige Probleme aufgetreten. Erstens sind derzeit GaN-Substrate mit Versetzungsdichten von 10 4 . erhältlich –10 6 cm −2 , aber diese Versetzungsdichten sind immer noch viel höher als die von Si- und SiC-Substraten [19]. Zweitens in Bezug auf die Wafergröße von 4–6 Zoll und die angemessenen Kosten (10 Euro/cm 2 ) von SiC, die Größe von 2–3 Zoll und die relativ hohen Kosten (100 Euro/cm 2 ) des GaN-Substrats hemmen die Kommerzialisierung und Produktivität von GaN im großen Maßstab [20]. Abgesehen von der Erhöhung der Anbieterzahlen ist die Heteroepitaxie auf Fremdsubstraten (Si, Saphir oder SiC) ein alternativer Weg, um die Kosten von GaN-Substraten zu senken, aber die Herausforderung relativ hoher Fehlanpassungen und Defekten muss angegangen werden.
Neben den oben genannten Problemen bei Bulk-Materialien besteht die Herausforderung für die GaN-Diode darin, eine hohe Qualität des p . zu erreichen -Art Material. In Bezug auf die relativ fortgeschrittenen Techniken zur Bildung von p -Typ SiC durch Al-Ionenimplantation, unreif p -Typ-Ionenimplantationstechnologie und die geringe Akzeptoraktivierung für p -Typ GaN sind lebenswichtige Hindernisse, die die Entwicklung der Struktur und Herstellung von GaN-basierten Geräten einschränken. Daher werden verschiedene Arten von Kantenabschlussstrukturen vorgeschlagen, um die Leistung von GaN-Dioden zu verbessern, und bilden einen wichtigen Teil dieser Überprüfung.
Vertikale GaN-basierte Geräte auf dem FS-Substrat
Bis vor 10 Jahren wurden die meisten GaN-Dioden, einschließlich SBDs und PNDs, auf fremden Substraten hergestellt, die laterale oder quasi-vertikale Bauelementstrukturen bildeten, da kein massives GaN-Substrat verfügbar war. Laterale oder quasi-vertikale Dioden weisen hervorragende elektrische Eigenschaften auf, leiden jedoch immer noch unter inhärenten Nachteilen aufgrund der Gerätestruktur [21]. Erstens sind die Diskrepanz und die Defekte unvermeidlich. Dann ist für GaN-Bauelemente auf Fremdsubstraten ein Puffer zwischen der GaN-Driftschicht und dem Fremdsubstrat unerlässlich. Somit würde die Spannungsrelaxation der Pufferschicht eine Durchbiegung des Wafers verursachen, was die Dicke der GaN-Epitaxieschichten verringert [22]. Darüber hinaus hat der große thermische Grenzwiderstand (GaN mit Substrat) einen ernsthaften Einfluss auf die Geräteleistung für GaN-Geräte, die mit hoher Leistungsdichte arbeiten [23].
Gemäß der Entwicklung von Epitaxietechniken hat ein freistehendes GaN (FS-GaN)-Substrat mit niedriger Versetzungsdichte, das für vertikale GaN-Bauelemente verwendet wird, große Fortschritte gemacht. Die Materialqualität von homoepitaktischem GaN auf dem FS-GaN-Substrat weist eine deutliche Verbesserung auf und zeigt das Potenzial für Leistungsanwendungen. Vertikale GaN-Bauelemente könnten die Nachteile seitlicher GaN-Gegenstücke mildern. Erstens können dickere epitaktische GaN-Schichten ohne Puffer gezüchtet werden und höhere BV (die die von lateralen GaN-Vorrichtungen übersteigen) erhalten und durch die Dicke der Driftschicht bestimmt werden. Unterdessen befindet sich ein maximales elektrisches Feld im inneren Teil der Vorrichtungen und ist weit von der Vorrichtungsoberfläche entfernt (wodurch der Effekt des Elektroneneinfangens beseitigt wird, der im Allgemeinen bei seitlichen Vorrichtungen auftritt). Aufgrund der hohen Qualität des FS-GaN-Substrats werden seit 2011 vertikale GaN-Bauelemente untersucht [24]. Seitdem vertikale GaN-PNDs mit hohem BV und niedrigem Durchlasswiderstand wurden hergestellt und erzielen eine bemerkenswerte Leistung.
PND versus SBD
Für praktische Anwendungen sind Dioden wesentliche Komponenten zur Leistungsumwandlung und -inversion [25]. Mit den unterschiedlichen Materialeigenschaften von GaN weisen GaN-basierte Dioden (SBDs und PNDs) bemerkenswerte Leistungen auf, von denen erwartet wird, dass sie die Anforderungen von Leistungsanwendungen erfüllen. Wie in Abb. 2 gezeigt, haben die PNDs den größten Anwendungsbereich unter den GaN-Geräten mit unterschiedlichen Strukturen und Spannungsfestigkeiten von 600 bis 5000 V, ein Merkmal, das auf breitere Anwendungsszenarien hinweist.
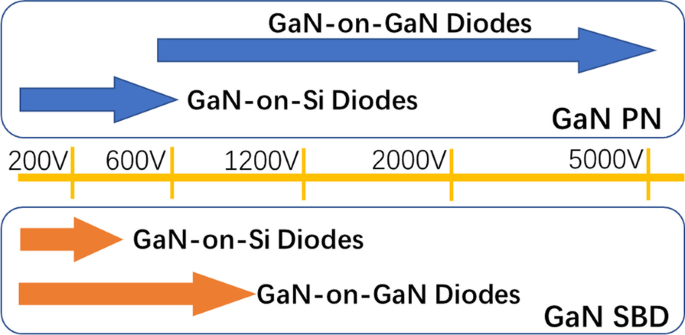
Übersicht über die Gerätetypen, Berichte und Spannungsklassen der wichtigsten vertikalen GaN-Leistungsgeräte, die in den letzten Jahren gemeldet wurden [26]
Im Vergleich zu PNDs, die kein Problem mit der Speicherung von Minoritätsträgern und eine niedrigere SBD-Barrierehöhe aufweisen, weisen GaN-SBDs eine niedrige Durchlassspannung (V an ) und schnelle Rückwärtserholung, und diese Eigenschaften zeigen, dass sich die Vorteile von SBD in einem niedrigen Leitungs-/Schaltverlust, einem Hochfrequenzbetrieb, aber einem niedrigeren BV . zeigen Wert als der von PND; Beachten Sie außerdem, dass eine hohe Einschaltspannung zu einem hohen Leitungsverlust führen und die Effizienz von Schaltungen und Systemen verschlechtern kann [27, 28].
Bei den Hochleistungsfeldern haben quasi-vertikale oder vertikale SBDs hervorragende Vorteile gegenüber AlGaN/GaN-SBDs [29]. Darüber hinaus wird eine niedrige Einschaltspannung (< 0,5 V) durch Einstellen der Barrierenhöhe mit einem Metall mit niedriger Austrittsarbeit erreicht. Eine niedrige Barrierenhöhe kann jedoch leicht zu einem hohen Rückwärtsleckstrom führen und den BV . senken . Folglich werden verschiedene Kantenabschlussstrukturen vorgeschlagen, um die Leistung zu verbessern. Die hohe Stromdichte bei KA/cm 2 Klasse mit BV s über 1 kV wird bestätigt. Inzwischen zeigen vertikale SBDs auch eine hervorragende Fähigkeit für hohe Frequenzen, wie 177–183 GHz und eine maximale Grenzfrequenz von 902 GHz bei 0 V, eine Eigenschaft, die für Stromquellen in drahtlosen Terahertz-Kommunikationssystemen erwartet wird [12, 32].
In Bezug auf n -Typ GaN, das p -GaN, das durch metallorganische chemische Gasphasenabscheidung (MOCVD) und Molekularstrahlepitaxie (MBE) gezüchtet wurde, wurde unter Verwendung von Mg als Akzeptor eingeführt [33]. Im Vergleich zu GaN-SBDs haben GaN-PNDs viele Vorteile, wie z. B. einen niedrigen spezifischen Einschaltwiderstand (R an A ) und ausreichende Gerätestabilität und Fähigkeit zur Verhinderung von Stoßströmen. Trotz hoher Einschaltspannung (> 3 V) und relativ geringer Schaltgeschwindigkeit ein extrem geringer Ableitstrom aufgrund der höheren Barrierenhöhe und des hohen BV erhalten wird. Beachten Sie, dass ein hoher BV von 0,6 bis 5 kV ist die herausragendste Leistung für GaN-basierte PNDs. Somit haben GaN-basierte PNDs ein großes Potenzial als wichtige Bausteine der nächsten Generation von Stromsystemen für Hochleistungsanwendungen, die einen hohen Wirkungsgrad und einen geringen Energieverlust erfordern [34]. Ähnlich wie bei vertikalen GaN-SBDs werden auch die Kantenabschlüsse für GaN-PNDs hergestellt, um die Ansammlung des elektrischen Felds um die Anode herum zu verringern, ein Merkmal, das später in diesem Artikel ausführlich beschrieben wird.
In Leistungsbauelementen kann der PN-Übergang auch als neuartige Übergangsstruktur behandelt werden. Für die Nutzung eines hohen BV mit niedrigem Sperrleckstrom von PNDs, hoher Schaltleistung und gleichzeitig niedriger Einschaltspannung von SBDs erzeugen neuartige Bauelementstrukturen einschließlich der Junction Barrier Schottky (JBS) und Merged PN Schottky (MPS) eine Kombination aus SBD und PND durch die Bildung von p -Gitterregionen in der Schottky-Kontaktregion. JBS- oder MPS-Geräte besitzen die Eigenschaften der Vorwärtsleitung von SBDs und der Rückwärtssperrung von PNDs und sollen eine bessere Schaltleistung und eine höhere Sperrspannung aufweisen als herkömmliche PNDs bzw. SBDs [35].
Neben ihrer Hochleistungsanwendung werden GaN-PNDs wegen der geringen Dunkelströme von wenigen pA in GaN-basierten PN-Übergangs-Photodioden auch für optoelektronische Bauelemente wie Leuchtdioden (LEDs), Photodetektoren und für die Flammenerfassung eingesetzt [36 , 37].
Zweck dieser Rezension
Aufgrund der hervorragenden Materialeigenschaften von GaN wurden GaN-basierte Bauelemente umfassend untersucht und als eines der heißesten Halbleitermaterialien in Anwendungen der Leistungselektronik eingesetzt. Unter den GaN-basierten Bauelementen wurde das vertikale GaN-basierte PND beträchtlich erforscht und zeigt ein ausgezeichnetes BFOM. Die Kantenanschlusstechniken sind auch wichtig, um das elektrische Feld, das sich um das Anodenpad herum drängt, zu mindern.
In diesem Aufsatz werden die Fortschritte im Bereich Materialepitaxiewachstum und Edge-Terminal-Techniken als Hauptschwerpunkte verfolgt, indem die aktuellen GaN-Entwicklungen, die Unterschiede zwischen GaN-SBDs und PNDs in Bezug auf Mechanismen und Merkmale sowie die Vorteile vertikaler Bauelemente gegenüber lateralen Bauelementen veranschaulicht werden . Diese Übersicht bietet einen Ausblick und zeigt den Designtrend von vertikalen GaN-PNDs auf, die für ein Stromversorgungssystem verwendet werden, einschließlich vertikaler GaN-PNDs. Die Entwicklung des epitaktischen Wachstums entsprechend einer anderen Schicht in vertikalen GaN-PNDs wird in Abschn. 2. Die Edge-Terminal-Technologien werden in Abschn. 3. In Abschn. In 4 werden die vertikalen GaN-PNDs auf Si-Substrat als alternative Methode demonstriert. Abschließend werden die Schlussfolgerung und der Ausblick auf die zukünftige Entwicklung von vertikalen GaN-PNDs gegeben.
Wachstum der materiellen Epitaxie
GaN-Substrat von vertikalen PNDs
Als Mainstream-Epitaxieverfahren werden vertikale Epitaxieschichten derzeit hauptsächlich durch MOCVD auf leitfähigen GaN-Substraten aufgewachsen, die durch Hydrid-Dampfphasenepitaxie (HVPE) hergestellt werden. Bei dieser Struktur beeinflusst die Qualität des Substrats direkt die folgende epitaktische Struktur. Viele Versagensmechanismen in der Vorrichtung haben ihren Ursprung in der Qualität der Substratepitaxie [38]. Ein leitfähiges GaN-Substrat von hoher Qualität muss erhalten werden, um das Vorwärts- und Rückwärts-I . weiter zu verbessern –V Leistungen, insbesondere der Rückwärtsleckstrom und BV Fähigkeit.
Durch HVPE gezüchtetes Substrat wurde aufgrund seiner relativ geringen Kosten und Reproduzierbarkeit als das bequemste Verfahren für die Massenproduktion angesehen. In der Anfangsphase führte die unausgereifte Wachstumstechnologie jedoch dazu, dass das durch HVPE gezüchtete GaN-Substrat eine hohe Hintergrundträgerkonzentration aufwies (> 10 19 cm −3 ) und unbefriedigende Kristallqualität. Daher wurde das HVPE nicht verwendet, um die Gerätestruktur zu vergrößern [39]. Durch die rasante Entwicklung der Epitaxie-Wachstumstechnologie werden nach und nach qualitativ hochwertige Bulk-GaN-Materialien durch HVPE möglich [40, 41]. Abgesehen vom Substrat kann die teilweise epitaktische Schicht im Gerät jetzt durch HVPE gezüchtet werden und kann zu einer höheren Stromgleichmäßigkeit und zur Eliminierung der Makrostufe auf der GaN-Oberfläche führen, indem HVPE und der MOCVD-Epitaxieprozess mit kohlenstofffreier Technologie verglichen werden ausschließlich durch MOCVD [42].
Derzeit ein kommerzielles GaN-Substrat mit einer minimalen Versetzungsdichte von weniger als 10 4 cm −2 ist verfügbar. Die vertikalen GaN-PNDs auf einem GaN-Substrat mit niedriger Defektdichte wurden verarbeitet. Das Durchbiegen der Wafer bleibt jedoch ein Problem. Als vielversprechende Lösung kann die ammonothermale Methode ein GaN-Substrat mit besserer Epitaxiequalität erzielen. Mit den Hochdruckautoklaven und überkritischem Ammoniak kann die Einfädelungsversetzung deutlich auf 10 4 . reduziert werden –10 5 cm −2 [43]. Mit der ammonothermalen Methode ein niedriger Widerstand von 0,001 Ω cm 2 im GaN-Substrat mit hochdotiertem n -Typ (1 × 10 19 –1 × 10 20 cm −3 ) wurde ebenso gemeldet wie die BV von 3 kV [44]. Der Nachteil der ammonothermalen Methode ist jedoch die geringe Wachstumsrate von etwa 80–90 μm/Tag, die für die praktische Produktion nachteilig ist. Die Verbesserung der Wachstumsrate und die Aufrechterhaltung einer hohen Materialqualität sind auch gewinnbringende Richtungen für die spätere Forschung.
Neben dem kommerziellen GaN-Substrat wurden auch einige Substrate auf ihre charakteristischen Eigenschaften untersucht, einschließlich der Nicht-Ga-Ebene (c -ebene) Substrate. Im Allgemeinen ist ein Ga-Polar (d. h. c -plane)-Substrat wird für eine vertikale GaN-Vorrichtung verwendet. Dann zeigen die folgenden Epitaxieschichten einen drastischen Polarisationseffekt. In der entgegengesetzten Richtung der Ga-polaren Gegenstücke sind die homoepitaktischen Schichten entlang des N -polare Richtung zeigen aufgrund der höheren Zersetzungstemperatur und der polaritätsabhängigen Eigenschaft einzigartige Geräteeigenschaften [45, 46]. Mit dem N -polares einkristallines FS-GaN-Substrat wurde ein elektrisches Feld von 2,2 MV/cm ohne jegliche Kantenabschlüsse erreicht, sowie ein BV von 2,4 kV mit N2 O-Oberflächenplasmabehandlung und Feldplatte (FP) [46, 47]. Als weiteres spezielles GaN-Substrat ist das m -Ebene erregt ebenfalls große Aufmerksamkeit aufgrund ihrer unpolaren Eigenschaft, für die Ga:N im m . 1:1 war -Ebene bezüglich nur Ga im c -polar und nur N im N -polare Substrate. Mit diesem unpolaren GaN-Substrat wurden die Eigenschaften von PNDs mit einem kritischen elektrischen Feld von 2,0 MV/cm und einem hohen An/Aus-Verhältnis ohne FP oder Kantenabschluss beschrieben [48].
N-GaN-Epitaxietechniken
Bevor es hochwertige leitfähige GaN-Substrate gab, wurden GaN-PNDs hauptsächlich auf Fremdsubstraten wie Si, SiC und Saphir hergestellt. Daher war der Aufbau von Geräten immer auf seitliche beschränkt. Zur Verbesserung der epitaktischen Qualität wurde ein auf der lateralen Struktur basierendes Verfahren vorgeschlagen. Bei einer geringen Durchfädelungsversetzung (TD) im Fensterbereich an seitlichen Bauelementen kann die seitlich über die Maske aufgewachsene GaN-Epitaxieschicht eine viel niedrigere TD-Dichte erreichen. Somit wurde laterales epitaktisches Überwachsen durchgeführt, um die GaN-Epitaxieschicht auf einem Saphirsubstrat für laterale PNDs aufzuwachsen. Der Rückwärtsleckstrom wurde um drei Größenordnungen unterdrückt [49].
Mit der Entwicklung der Epitaxietechnologie werden hochwertige einkristalline GaN-Substrate mit geringen Versetzungsdichten von 3 × 10 –6 cm −2 verfügbar, und GaN-PNDs wurden auf GaN-Substraten hergestellt. In Kombination mit oberen Epitaxieschichten durch MOCVD-Wachstum zeigen die Bauelemente einen geringen Leckstrom und einen hohen BV von 600 V bis 4 kV entsprechend einer Driftdicke von 6 bis 40 μm [16, 50]. In Bezug auf das Gerät auf dem Saphirsubstrat:Rückwärtsleckstrom und BV deutlich verbessert [51].
Beim nativen GaN-Substrat tritt in der PND-Epitaxiestruktur normalerweise keine spezielle Pufferschicht auf wie bei einem Fremdsubstrat. Als Referenz wurde die Wirkung der Pufferschicht im PND auf das GaN-Substrat untersucht. Das Vorhandensein einer Pufferschicht bedeutet, dass die Driftschicht eine geringere Defektdichte aufweist. Inzwischen eine höhere BV kann mit einer dünneren Driftschicht, aber einer dickeren Pufferschicht erhalten werden. Auch der Rückwärtsleckstrom des Geräts wurde verbessert. Diese Geräteparameter weisen eine starke Beziehung zur Dicke der Pufferschicht auf, was einen leichten Einfluss auf die Vorwärtscharakteristik des Geräts hat [52].
Die oberen Epitaxieschichten werden durch MOCVD, metallorganische Gasphasenepitaxie (MOVPE) und MBE abgeschieden, wie in diesem Abschnitt erörtert. Die epitaktische Struktur von PNDs enthält ein hochdotiertes n + -GaN-Schicht und eine Driftschicht von n − -GaN zwischen dem Substrat und p -GaN (Abb. 3). Das hochdotierte n + -GaN-Schicht fungiert in einigen Berichten als Übergangsschicht auf dem leitfähigen GaN-Substrat.
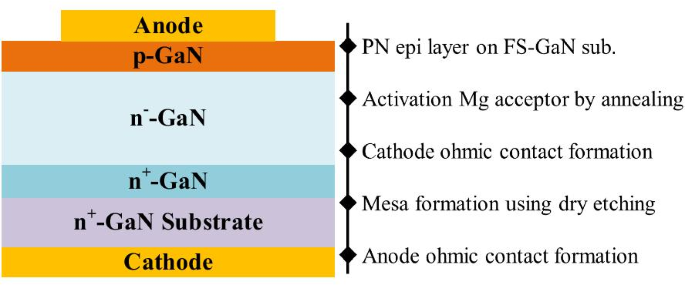
Schematischer Aufbau und Herstellungsprozess eines vertikalen GaN-PND
Im Allgemeinen ist die BV bestimmt die Anwendungsszenarien von Geräten. Zum Beispiel der höhere BV für ein SiC-Bauelement im Vergleich zu dem mit GaN ermöglicht den Einsatz des SiC-Bauelements in Hochleistungs- und Hochspannungsanwendungen wie Elektrofahrzeugen und Hochgeschwindigkeitszügen (Abb. 1). Ähnlich werden PN-Dioden normalerweise bei höheren Spannungen in Bezug auf die Schottky-Diode und HEMTs verwendet. In PNDs ist die BV wird hauptsächlich von der Driftschicht übernommen (leicht dotiert n − -GaN-Schicht) mit der Verbreiterung des Verarmungsbereichs (wie in Gleichung 1 dargestellt mit angelegter Spannung V für die V positiv/negativ für die Vorwärts-/Rückwärts-Vorspannung ist, wenn das Gerät unter Rückwärts-Vorspannung steht. Darüber hinaus tritt der Durchbruch mit weiterem Anstieg der Sperrspannung auf.
$${W_{\text{D}}} =\sqrt {\frac{{2{\varepsilon_{\text{s}}}\left( {{V_{{\text{bi}}}} - V } \right)}}{q}\frac{{{N_{\text{A}}} + {N_{\text{D}}}}}{{{N_{\text{A}}}{N_ {\text{D}}}}}}$$ (1)wo S , q , V bi , N D , und N A sind die Fläche des Übergangs, die elektronische Ladung, das eingebaute Potential, die Donorkonzentration bzw. die Akzeptorkonzentration [53].
Je nach Erschöpfungsbreite lassen sich die Geräte in Non-Punch-Through-[W D> W Dm (W Dm :maximale Sperrschichtbreite)] und Punch-Through (W D < W Dm ). Angesichts der Probleme der Epitaxiestruktur und -kante fallen die meisten vertikalen GaN-Bauelemente unter den Durchgriffstyp, d. h. ihre Verarmungsbereiche erstrecken sich über das gesamte n . hinaus − -GaN-Schicht und erreichen Sie die n + -GaN-Substrat vor dem Durchbruch.
Außerdem, wie in Gl. (2), die BV kann durch Erhöhen der Dicke und Verringern des n . verbessert werden -Dotierungskonzentration der Driftschicht.
$${\text{BV}} ={E_{\text{C}}}t - \frac{{q{N_{\text{D}}}{t^2}}}{{2{\varepsilon_0 }{\varepsilon_{\text{r}}}}}$$ (2)wo E C , q , t , N D , und ε r sind das kritische elektrische Feld, die Elektronenladung, n − -GaN-Schichtdicke, Nettoladungsträgerkonzentration des n − -GaN-Schicht bzw. Halbleiterpermittivität [54]. Glücklicherweise zeigt die Erfahrung, dass eine Driftschicht mit dickerer Dicke und geringerer Dotierung nur zu einer geringfügigen Erhöhung des Durchlasswiderstands bei Vorwärtsleitung beiträgt.
Verglichen mit der Verbesserung der BV durch Erhöhung der Driftschichtdicke, Verringerung des n -Typ Dotierungskonzentration im n − -GaN-Schicht ist derzeit aufgrund der hohen Hintergrundkonzentrationen einschließlich derjenigen von Si, O usw. schwierig. Zur weiteren Verringerung der Dotierungskonzentration im n − -GaN-Schicht wird die ungewollte Dotierungskonzentration untersucht. Viele Forschungsgruppen führten ein nominelles i-GaN von ungefähr 10 15 . ein –10 16 cm − 3 Kontaktaufnahme mit p -GaN zur Bildung des p –ich –n Struktur zur Verbesserung der BV von Dioden [55].
Voraussetzung für diese Maßnahmen ist sicherlich eine hohe epitaktische Qualität der Driftschicht, da die TDs die Sperrverluste erhöhen und die BV . verschlechtern können Eigenschaften [56].
Um die epitaktische Qualität der Driftschicht in vertikalen GaN-PNDs weiter zu verbessern, wurde das Wachstum durch MBE auf dem GaN-Substrat untersucht. Ein Ableitstrom von weniger als 3 nA/cm 2 und ein elektrisches Feld von 3,1 MV/cm wurden durch die sehr geringe Versetzungsdichte erhalten. Die nahezu idealen Durchbruchleistungen weisen darauf hin, dass die MBE eine effektive Methode zum Aufwachsen epitaktischer Schichten in vertikalen GaN-PNDs ist [56]. Ähnlich wie beim ammonothermalen Wachstum ist die Epitaxie jedoch ein weiterer Nachteil.
P-GaN-Epitaxie
P-GaN, eine wichtige Komponente in vertikalen GaN-PNDs, wurde 1989 seit dem Erscheinen von GaN durch HVPE im Jahr 1969 beschrieben [57, 58]. Es wurde zuerst verwendet, um blaue LED zu erhalten. Dann die p -GaN wurde nach und nach im Bereich elektrischer Geräte wie selbstsperrende Geräte und PNDs eingesetzt. In vertikalen GaN-PNDs ist der p -GaN bildet Licht (ca. 10 19 cm −3 ) und schwer (≥ 10 20 cm −3 ) Dotierungskonzentration, die der Bildung einer PN-Übergangsschicht mit der Driftschicht und der Erleichterung ohmscher Kontakte als Anodenelektrode entspricht.
Im Allgemeinen ist das epitaktische Wachstum eines p -GaN wird durch MOCVD bei einer Temperatur von etwa 1000 °C hergestellt und nimmt das Mg 2+ . an als Akzeptor. Dann wird das gewachsene p -GaN-Schicht muss bei hohen Temperaturen von 700–800 °C in N2 . aktiviert werden Umgebungstemperatur oder 400 °C in O2 Umgebung, wodurch eine relativ hohe Lochkonzentration ermöglicht wird [59,60,61]. Die hohe Ionisierungsenergie von 150–200 meV der Mg-H-Bindung bedeutet jedoch ein p -GaN-Aktivierungsrate von nur 1–3%. Eine niedrige Aktivierungsrate hängt auch mit der Temperatur zusammen. Die Mg-Dotierstoffe können bei hohen Temperaturen von ≥ 600 °C in NH3 . repassiviert werden oder Wasserstoffumgebung [62]. Um die Lochkonzentration zu verbessern, ist eine alleinige Erhöhung der Dotierungskonzentration nicht möglich, da eine höhere Dotierungskonzentration im p -GaN könnte zu einer Verschlechterung der kristallinen Qualität der Schicht führen und die Lochdichte durch einen Selbstkompensationseffekt verringern [63]. Derzeit kann eine Spitze der Lochdichte normalerweise bei einer Akzeptorkonzentration von ungefähr 3 × 10 19 . erreicht werden cm −3 [64]. Obwohl es einige Probleme für p gibt -GaN, dazugehörige Untersuchungsberichte sind nicht viel. Es kann auf zwei Gründe zurückgeführt werden. Einer davon sind die Beschränkungen der intrinsischen Eigenschaften von Material und epitaktischer Ausrüstung. Ein anderer ist, dass das gegenwärtige p -GaN kann auch eine vergleichbare Geräteleistung erzielen.
Die Optimierung der Wachstumsbedingungen und neuartige epitaktische Verfahren werden jedoch noch untersucht. Im Jahr 2017 zum Beispiel das nicht aktivierte Nachwachsen p -GaN von MBE wurde vorgeschlagen und hat einen Vorteil gegenüber MOCVD. In der Umgebung mit geringem Wasserstoffwachstum ist ein BV von 1,1 kV und einem Idealitätsfaktor von 2,5 wurden von den hergestellten vertikalen GaN-PNDs erreicht [65]. Ein weiteres interessantes p -GaN-Herstellungsmethode ist die Mg-Ionenimplantation mit einem Ultrahochdruck-Ausheilungsprozess (UHPA). Die Ergebnisse zeigen, dass eine hohe Aktivierungsrate von 70 % und eine Lochmobilität von 24,1 cm 2 V −1 s −1 wurden mit einem Tempern nach der Implantation bei einer Temperatur von 1573–1753 K in N2 . erreicht Druck von 1 GPa. Dieses Ergebnis ist vergleichbar mit dem des Epitaxiewachstums durch MOCVD [66].
Zusammenfassend lässt sich sagen, dass für Substrate jetzt das kommerzielle GaN-Substrat mit geringen Defekten verfügbar ist. Unterdessen entwickelt sich die Epitaxie-Technologie immer noch, eine Situation, die sich stark auf die Geräteleistung auswirkt. Im Vergleich zu MOCVD kann der MBE eine hervorragende epitaktische Qualität erreichen, was zu einer großartigen Geräteleistung ohne Kantenabschlüsse führt. Die langsame Wachstumsrate und die hohen Kosten machen die MBE jedoch für eine Produktivität im großen Maßstab ungeeignet. Das Epitaxiewachstum durch MOCVD ist in der Praxis immer noch die wichtigste produktive Methode. Daher ist die Verbesserung der Qualität von durch MOCVD gezüchteten Epitaxieschichten ein dringendes Anliegen, das beträchtliche Zeit in Anspruch nehmen würde. Daher werden in dieser Phase fortschrittliche Gerätestrukturdesigns oder -maßnahmen für eine hervorragende Leistung vorgeschlagen.
Edge-Terminierungstechniken
For a vertical GaN PNDs, BV is an important parameter. Almost all investigations on vertical GaN PNDs are centered on improving the withstanding voltage at reverse (i.e., BV ). However, due to the electric field crowding at the edge of PN junction, the depletion layer edge, or the electrode edge, premature breakdown often occurs. Therefore, to reduce the electric field crowding of the device, advanced device structure designs (i.e., edge termination techniques) are developed. Varied edge termination techniques have now been adopted to relax the electric field crowding at the edge of GaN PNDs for a higher BV . These techniques include mainly the field plate (FP), ion implantation and plasma treatment, and mesa etching in varied angle or steps and guard rings (GRs) [49, 67,68,69]. These features are discussed in this section.
Metal Field Plates
The FP has been widely utilized in GaN-based devices for transferring the peak electric field far from the edge of the gate, anode, or junction. This method has an identical feature to relax the intensity of the electric field at the PN edge under reverse bias. Moreover, the low leakage current and high breakdown voltage under reverse voltage can be achieved by using FP termination, which has a relatively simple fabricating process as well.
The merits of the FP structure include a simple fabrication process and compatibility with the device process. Simultaneously, the dielectric layer of FP is also the passivation layer of the device. As the earliest and most widely used edge termination for vertical GaN PNDs, the non-extended FP termination was initially used, as shown in Fig. 4a. For fabricating the FP structure, mesa structures were processed by inductively coupled plasma (ICP) dry etching. Then, to suppress the parasitic leakage currents from plasma damage, a passivation dielectric film was deposited all over the anode electrode and the entire mesa structure [70].
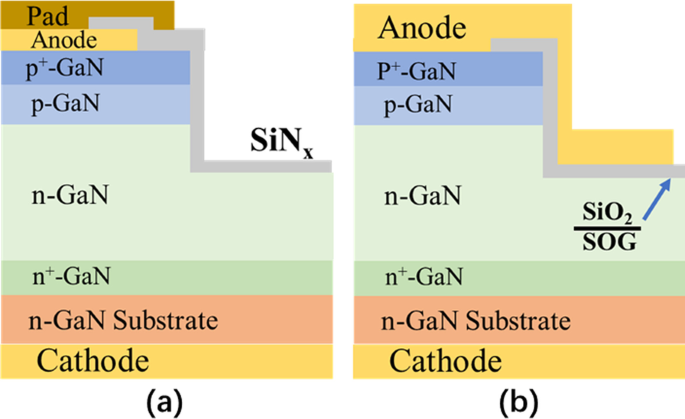
PNDs’ structures with a FP and extended passivation dielectric layer and b extended FP metal and passivation dielectric layer [70, 71]
To furtherly relax the electric field crowding at the periphery of the PN junction edge, the extended metal of the FP was utilized to cover the entire mesa to reduce the reverse leakage current and raise the BV [71]. This optimized FP structure is now widely employed in vertical GaN PNDs fabrications. As shown in Fig. 4b, the BV was raised over 3 kV with an extended FP structure. Meanwhile, the reverse leakage current was also suppressed to a quite low level at revere voltage of 3 kV.
As an essential component of the FP structure, the passivation layer has a considerable impact on the device characteristics. Thus, an appropriated passivation layer is essential. A passivation layer owned high-k permittivity is proposed by simulation, and uniform reverse current flow can be also obtained [50]. According to this theory, vertical GaN PNDs with FP termination using Ga2 O3 (the dielectric permittivity of 10) as passivation film were reported. The BV had a large improvement from 200 to 550 V, thereby revealing that a high-k permittivity film such as Ga2 O3 is promising as a passivation film of FP termination in vertical GaN PNDs for raising device characteristics [72]. However, some demerits arise for FP termination. The main issue is the defect during the dielectric layer deposition and interface between the dielectric and GaN, which result in carrier trapping. These would lead to the instability of device performance during long-term use. Therefore, the optimized deposition process of the dielectric layer must be investigated.
Mesa Termination
Mesa etching is an indispensable step to isolate adjacent devices in the fabrication of planar GaN-based devices. Given the simple process, this structure is popular for vertical GaN PND processes. Aside from a uniform electric field at the edge of PN junction, a high BV with nondestructive and avalanche characteristics can be achieved in PNDs. For instance, a simple but deep mesa structure can obtain great performance. As shown in Fig. 5a, with more than 10 µm depth of mesa structure in vertical PNDs, nondestructive BV and avalanche characteristics were confirmed [73].
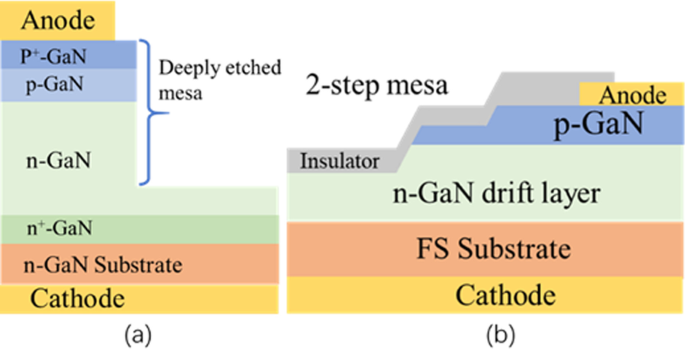
a PNDs with deeply etched mesa structure; b PNDs with two-step mesa [73, 74]
The novel mesa structures are investigated as shown in Fig. 5b. A multi-mesa (two-mesa) structure was adopted in vertical PNDs. With respect to the common single mesa structure, the two-mesa structure can shift the peak electric field from the edge of the PN junction to underneath the thinned p -GaN in the upper mesa because of the total depletion of holes in the thinned p -GaN layer. A high BV of 4.7–4.8 kV with nondestructive feature was successfully achieved by the two-mesa structure. Avalanche capability was obtained without lowering the forward I –V characteristics [74]. On the other hand, the two-mesa structure has the identical function for quasi-vertical PINDs [75]. The BV was enhanced from 665 to 835 V with the low leakage current simultaneously.
Besides the common perpendicular mesa structure, a mesa structure with negative bevel was recently proposed to mitigate the electric field crowding at edge of the PN junction. With the negative bevel mesa, the electric field at the edge has a decreasing trend when the bevel angle θ is lowered from 90˚. The peak electric field would be transferred into device inner. In [76], experimental investigation showed that beveled mesa structure (Fig. 6a) could induce a higher BV over 3 kV and a low leakage current with respect to BV of 3 kV in PNDs with steep mesa when using the same FP structure. Further investigation was performed by simulation using technology computer-aided design (TCAD). In vertical GaN PNDs with beveled mesa (Fig. 6b), the maximum electric field was determined by the acceptor concentration N A in p -GaN, donor concentration N D in n − -GaN drift layer, and θ of the beveled mesa. By theoretical analysis and simulation, the smaller θ could lead to higher E pp (parallel-plane breakdown field). At the same time, a lightly doped p -GaN is beneficial for achieving high BV for a fixed θ of the beveled mesa. Taking θ = 10° as an example, the experimental results support these findings. A parallel-plane breakdown field of 2.86 MV/cm was achieved, and this outcome is consistent with the simulation [77].
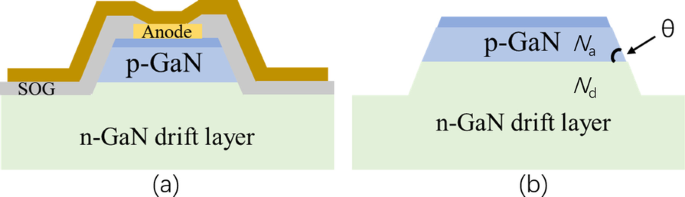
Schematic cross of PND structure with a bevel mesa and FP structure, b PND epitaxial structure is simulated by treating N A , N D und θ as variable [76, 77]
Similar with FP termination, the dry etching and/or insulator (or passivation film) is required in process of edge termination. Thus, the damage from dry etching must be considered and can cause a high reverse leakage current, even the premature breakdown. At the same time, it is a high demand to etched equipment for etched precision, and the etched depth is difficult to control. Meanwhile, the existence of damage generates a more complicated interface state between the insulator and the etched semiconductor, a situation that would affect device reliability. Consequently, reducing or alleviating damage is an inevitable issue. Now, some recipes (e.g., tetramethylammonium hydroxide (TMAH) and post-annealing that have the features of removing the damage by wet etching and repairing dry etching damage, respectively) have been adopted to treat etched surface to improve performance.
Ion Treatment
Ion implantation was employed to alleviate the electric field concentration near the edge. As a relatively simple termination structure, an implantation-based technique was investigated in GaN devices, which includes the compensating species (e.g., O, H, and Zn) or inert species (e.g., Ar, N, He, and Kr) to create deep-level traps in the termination regions [78,79,80,81,82]. Recently, for moderating the occurring of premature breakdown in vertical GaN PNDs, the ion implanted termination (e.g., N, F, Mg, and H) is also utilized. However, the mechanisms of these ion implanted terminations are different.
With respect to vertical GaN SBDs [83], N implantation in vertical GaN PNDs reveals a different mechanism, which entails creating the donor-like defects (N vacancy and N interstitial) to compensate for the p -type dopants. After processing by N implantation as shown in Fig. 7a and b, the conductivity of p -GaN can be reduced or eliminated (insulating) by N implantation [53]. To further improve the BV , a non-fully compensated layer was proposed, that is, a fully compensated layer coupled with a partially compensated counterpart in p -GaN. Thus, a higher BV was expected, and the mechanism was analyzed by simulation [84]. The experimental results show that N implantation with partially compensated p + -GaN could induce a BV of 1.68 kV without compromising the forward characteristics [85].
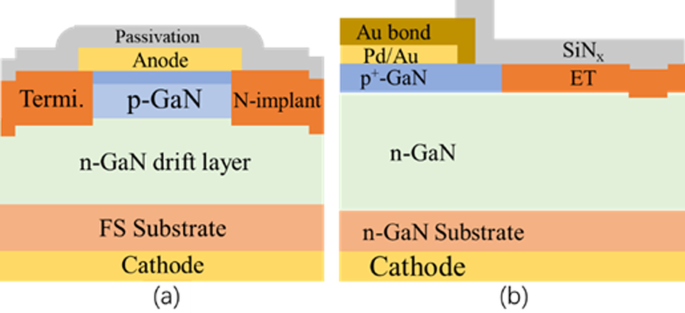
a Cross-sectional plot of the PNDs with N implantation termination, and b N implantation termination with fully and partially compensated [53, 84]
The hydrogen-plasma (H-plasma) edge termination can also reduce p -GaN conductivity, but with another mechanism. H-plasma treatment is an effective passivation method to transform the conductive p -GaN into a highly resistive one because of the strong bond of Mg-H in p -GaN. In contrast to N implantation, the H-plasma treatment is more appropriate for use in vertical GaN PNDs because of the low damage, low temperature, and simple operation involved. As shown in Fig. 8a, the PNDs exhibited an electric field of 3.0 MV/cm with just the H-plasma treatment. Simultaneously, the devices showed comparable forward I –V characteristics and a lower reverse leakage current [86].
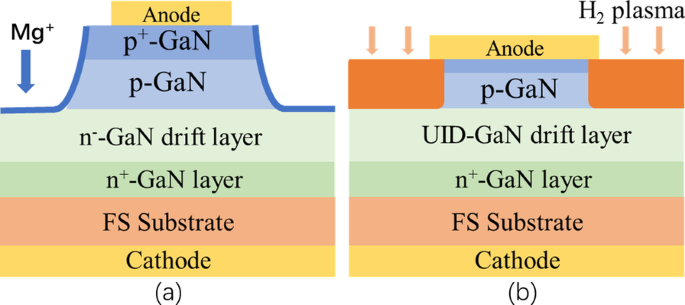
a Schematic view of PND structure by Mg ion treatment; b PNDs with H2 plasma treatment [86, 88]
At the same time, fluorine (F) ion also has the capability of modulating the peak electric field due to the negative fixed charges when the device is under a reverse bias. Nevertheless, if the F implanted edge termination is carried out in vertical GaN PINDs, strict design and structural optimization are needed [87].
In addition to the N, H, and F ion implantation as edge terminations, Mg ion implantation is also an alternative method to convert the surface/interface state, which originates from the damage of ICP dry etching. A novel Mg ion implantation coupled with moat mesa was recently adopted to compensate for the donor-like damage for GaN vertical PNDs (Fig. 8b). Then, a BV of 1.5 kV was achieved with a specific on-state R an of 0.7 mΩ cm 2 [88].
Ion implantation termination is an effective method for a high BV in vertical GaN PNDs. The ion implantation process is also relatively simple. However, crystal damage occurs during high-energy ion implantation. Moreover, post-annealing at high temperature is required in some of the ion implantation terminations for alleviating the crystal damage. The rectangle-shaped ion implantation profile is pursued, so the implantation depth must be controlled exactly. Finally, although the ion implantation process is simple, the equipment needed is costly due to usage of high energy ion.
Guard Rings
The use of floating guard rings (GR) as edge termination to improve BV is an effective method for vertical GaN PNDs, for which the reverse voltage has a voltage drop over the GR to relax the electric field crowding. At the same time, the GR fabrication process does not require a specialized step, which is synchronous with anode metal deposition. For a higher BV , a GR in the FP structure was fabricated in the PNDs (Fig. 9a), in which polyimide was set between the GR and anode portion as resistive device for a further voltage drop. Due to the resistance portion, an incremental 0.2–0.4 kV of BV to a maximum of 5.0 kV was obtained. Compared with normal PNDs without a GR structure, the device with a resistive GR exhibited a similar forward I –V characteristics with R an of 1.25 mΩ cm 2 , but a lower reverse leakage current with BFOM of 20 GW/cm 2 [69].
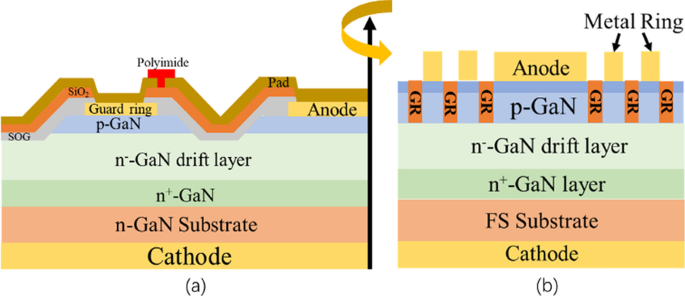
a Vertical GaN PNDs structure with floating GR termination; b PNDs structure with H-implanted GRs [69, 90]
Besides the floating GR, the H-plasma-based GR structure was also applied to form the edge termination. In addition to low damage, the low diffusivity of H-plasma could result in relatively ideal profile in GaN [89]. Owing to passivation effect of the H-plasma on p -GaN, the conductive p -GaN becomes highly resistive, and the GR structure was subsequently formed by the highly resistive p -GaN ring (Fig. 9b). The narrow GR width of 1–2 µm and decreasing spacing were used to improve the BV. GR structures with varied rings were measured. The PNDs with varied rings have similar forward characteristics with around 0.65 mΩ cm 2 and an ideality factor of 1.65 compared with those without GR. More GRs could further relax the electric field at the device edge. Thus, the devices exhibited a higher BV by increasing the number of rings after measurement. Consequently, the PNDs showed a BV of 1.7 kV with the highest electric field of 3.43 MV/cm 10 GRs [90].
The disadvantage of GR is its low area utilization rate, and the GR structure generally requires a large area, which is even bigger than anode. Then, the amount of GR raises the design difficulty such as the width and spacing of the GR. At present, two and more kinds of edge termination are adopted in single vertical GaN PNDs for a higher BV . These edge terminations typically include the FP, bevel mesa, and guard rings due to the relatively simple fabrications. On the other hand, these edge terminations are not meant to introduce the foreign element into the GaN crystal with respect to ion treatment, a feature that is beneficial for device performance. However, the quality of epitaxial layers still occupies a considerable proportion.
Vertical GaN PNDs on Si Substrate
To date, although vertical GaN-on-GaN devices exhibit excellent performance, the high cost and small diameter of GaN substrates still impede their large-scale market applications. Consider to the merit of a large scale and low cost of Si substrate, GaN-on-Si devices have attracted considerable many attentions at this stage.
For the quasi-vertical PND on Si substrate, high-quality buffer is essential. In [91], as shown in Fig. 10a, optimizing the AlN nucleation layer and the succeeding growth process, a GaN drift layer with a low threading dislocation density of 2.95 × 10 8 cm −2 and high electron mobility of 720 cm 2 /Vs wurde erhalten. With the FP structure, the device has a BV of 820 V with R an of 0.33 mΩ cm 2 .
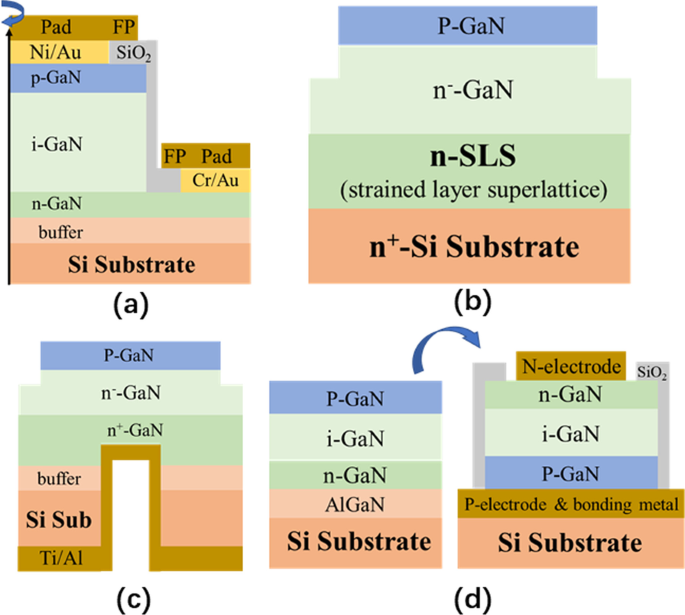
a Quasi-vertical PINDs with FP; b fully vertical PNDs by using the thin AlN and SLS superlattice structure on conductive Si substrate; c PNDs with trenched ohmic contact on back; d PNDs fabricated by layer transfer technology [91,92,93,94]
In addition to the challenge of materials mismatch, the conductive buffer layer and Si substrate are fundamental for fully vertical PNDs on Si substrate. In Fig. 10b, a n + -type Si substrate was first utilized as the cathode of vertical PNDs. Subsequently, the Si-doped thin AlN layer and GaN/AlN strained superlattice layer were employed to facilitate device performance [92]. Vertical PNDs on Si substrate are proposed with FP, and a BV of 288 V is confirmed with a drift layer of 1.5 µm. Moreover, a higher BV of 720 V in PNDs on Si with 5.7 µm drift layer is reported in Fig. 10c [93]. Unlike the conductive Si substrate method, the cathode ohmic on back approach was made by a trench, which reaches the n + -GaN layer through the selective removal of regular Si substrate and buffer layer.
Besides the conductive Si substrate and trenched ohmic contact on back, substrate removal technology is an alternative method to produce vertical GaN PNDs on Si substrates. In Fig. 10d, a layer transfer technology is used to process vertical PINDs on Si substrate. After Si substrate removal, transfer, n -electrode, and sidewall passivation, the devices exhibit a low R an of 3.3 mΩ cm 2 and BV of 350 V [94]. The high BFOM value of 37.0 MV/cm 2 in PINDs demonstrates that substrate removal technology is an effective way for GaN-based PIND fabrication on Si substrates. Relative to other technologies, however, the more complicated fabrication process and higher production cost are issues that must be addressed during the substrate removal part.
As an alternative technical route, PNDs on Si substrates are fabricated with quasi-vertical or vertical device structures. To mitigate the substantial material mismatch between the Si substrate and GaN epitaxial stacks, a more effective epitaxial technology must be investigated. For a higher BV , thicker drift layer is also essential for a higher BV . This fact presents another key issue to investigate because the drift layer thickness on Si substrate is approximately 5 µm.
Future Challenges and Conclusion
Vertical PNDs are essential to simultaneously obtain high current (> 100 A) with high voltages (> 600 V), which can meet the requirements of several applications including electric vehicles and recycled energy processing. Despite the great progress achieved, applications of vertical GaN PNDs remain several barriers such as cost and technical limitations.
For FS-GaN substrate, high epitaxial quality with low threading dislocation has been achieved by a common MOCVD. The small size and high cost of the FS-GaN substrate confine the applications of the vertical GaN PNDs within a narrow range, and the small size also raises the price of GaN. The commercial GaN substrate is only 2-inch and is much smaller than 4–6 inch SiC and 8–12 inch Si substrates. The primary challenge for vertical GaN PNDs is achieving high epitaxial quality, especially the high quality of the p -GaN layer with a high hole concentration. Recently, novel PNDs are proposed through replacing p -GaN with NiOx synthesized by thermal oxidation or sputtering; great performance is also demonstrated as replacement of p -GaN in vertical PND and guard ring in GaN SBD [95,96,97,98].
Vertical GaN PNDs, as one of the most promising power devices, are reviewed and summarized in this study. The recent progresses on vertical GaN PNDs, including comparison of different materials (SiC vs. GaN) and different device structures (SBD versus PND), material epitaxy growth and edge termination techniques (FP, MESA, ion implanted and GR edge terminations), are discussed. Die Werte von R an versus BV by varied technologies are plotted in Fig. 11. Aside from the epitaxial technologies, edge termination technologies play a key role for vertical GaN PNDs to achieve high device performance at this stage. Despite its great progress in terms of device performance, the advantages of vertical GaN PNDs remain under-exploited. The characteristics of vertical GaN PNDs could be promoted by optimizing the device structure and epitaxial quality in succeeding studies. Then, commercialized vertical GaN PNDs will soon be available in the future with mature edge termination and epitaxial techniques.
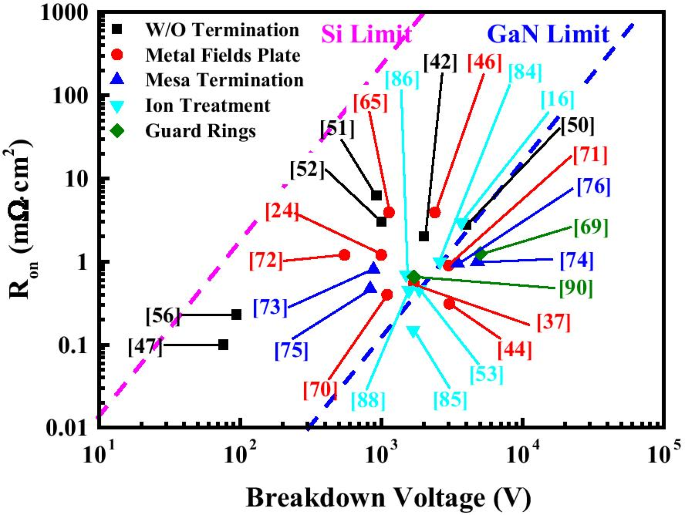
Benchmarking of the R an versus BV of quasi- or full-vertical GaN PNDs
Verfügbarkeit von Daten und Materialien
Die in der aktuellen Studie verwendeten bzw. analysierten Datensätze sind auf begründete Anfrage beim entsprechenden Autor erhältlich.
Abkürzungen
- GaN:
-
gallium nitride
- SiC:
-
silicon carbon
- PND:
-
PN junction diode
- PIND:
-
P-i-N junction diode
- SBD:
-
Schottky-Diode
- IGBT:
-
insulated gate bipolar transistors
- BJT:
-
bipolar junction transistor
- MOSFET:
-
metal oxide semiconductor field effect transistor
- BFOM:
-
Baliga’s figure of merit
- HFET:
-
heterostructure field-effect transistor
- JFET:
-
junction field-effect transistor
- 2DEG:
-
two-dimensional electron gas
- BV:
-
breakdown voltage
- FS:
-
free-standing
- MOCVD:
-
metalorganic chemical vapor deposition
- MBE:
-
molecular beam epitaxy
- JBS:
-
junction barrier Schottky
- MPS:
-
merged PN Schottky
- LED:
-
light-emitting diode
- HVPE:
-
hydride vapor phase epitaxy
- FP:
-
field plate
- TD:
-
threading dislocation
- MOVPE:
-
metalorganic vapor phase epitaxy
- HEMT:
-
high electron mobility transistor
- UHPA:
-
ultra-high-pressure annealing
- GR:
-
guard ring
- ICP:
-
inductively coupled plasma
- TCAD:
-
technology computer-aided design
- TMAH:
-
tetramethylammonium hydroxide
Nanomaterialien
- Stromquellen
- Geräte der nächsten Generation bieten verbesserte PoE-Funktionen für IoT-Geräte
- Geräte steigern die PoE-Leistung über vorhandene Switches und Kabel
- Nanogenerator
- IoT-Sicherheit:Was wir aus aktuellen Bedrohungen lernen können
- Ingenieure entwickeln extrem stromsparende WLAN-Funkgeräte
- Wie drahtlose Energie die Fertigung verändert
- Mehrere tragbare Geräte mit einer einzigen Quelle drahtlos mit Strom versorgen
- Verwendung von Solartechnologie zur Stromversorgung intelligenter Geräte in Innenräumen
- System gewinnt Energie aus Funkwellen, um tragbare Geräte mit Strom zu versorgen



