Eine Studie über die Wirkung der Strukturparameter und des internen Mechanismus eines bilateralen Gate-gesteuerten S/D-symmetrischen und austauschbaren bidirektionalen Tunnel-Feldeffekttransistors
Zusammenfassung
In diesem Beitrag wird ein bilateraler Gate-gesteuerter S/D-symmetrischer und austauschbarer bidirektionaler Tunnel-Feldeffekttransistor (B-TFET) vorgeschlagen, der den Vorteil der bidirektionalen Schalteigenschaften und der Kompatibilität mit integrierten CMOS-Schaltungen im Vergleich zum herkömmlichen asymmetrischen TFET zeigt. Die Auswirkungen der Strukturparameter, z. B. der Dotierungskonzentrationen des N + Region und P + Region, Länge des N + Region und Länge der intrinsischen Region, von den Geräteleistungen, z. B. den Übertragungseigenschaften, I an –ich aus Ratio und Subthreshold Swing sowie der interne Mechanismus werden ausführlich besprochen und erklärt.
Einführung
Der Stromverbrauch ist eines der Hauptprobleme der Industrie für integrierte Schaltungen. Wenn ein Gerät im eingeschalteten Zustand arbeitet, muss sein Leitungsstrom einen bestimmten kritischen Wert erreichen; wenn der Strom einen kritischen Wert erreicht, wird die entsprechende Gatespannung als Schwellenspannung definiert. Wenn sich das Bauelement im ausgeschalteten Zustand befindet, sollte die entsprechende Gate-Spannung einen anderen Wert haben als im kritischen eingeschalteten Zustand, der oft als Sperrspannung bezeichnet wird. Das Konzept des Unterschwellenwerthubs (SS) ist auf die Vorrichtung anwendbar, die zwischen dem Aus-Zustand und dem kritischen Ein-Zustand arbeitet, der gleich der Änderung der Gate-Spannung ist, wenn der Strom um eine Größenordnung ansteigt. Wenn das Gerät gut konstruiert ist, wurden der kritische Durchlassstromwert, die Schwellenspannung und die Sperrspannung des Geräts bestimmt; dann entspricht ein kleinerer SS stärkeren Stromänderungen im Unterschwellenbereich, einem kleineren statischen Strom des Geräts im ausgeschalteten Zustand und einem geringeren statischen Stromverbrauch des Geräts. Die SS von Metalloxid-Halbleiter-Feldeffekttransistoren (MOSFETs), die die in integrierten Schaltungen weit verbreiteten Basiszellen sind, wird durch den physikalischen Mechanismus des Stroms begrenzt, der während des Betriebs des Geräts erzeugt wird, und kann den Grenzwert von 60 nicht unterschreiten mV/dez. Um diese Einschränkung zu durchbrechen, wurde in den letzten Jahren ein Tunnel-Feldeffekttransistor (PIN- oder NIP-TFETs) basierend auf einer siliziumbasierten Technologie vorgeschlagen. Ein konventioneller TFET wird durch Hinzufügen einer Schicht aus intrinsischen Halbleitern mit niedriger Dotierung zwischen p - und n -Typ Halbleitermaterialien. Gegenüber MOSFET hat der TFET die Vorteile einer hohen Empfindlichkeit und einer geringen statischen Leistungsaufnahme [1]. TFET wird geschaltet, indem das Quantentunneln durch eine Barriere moduliert wird, anstatt die thermionische Emission über eine Barriere zu modulieren, wie beim herkömmlichen MOSFET. Somit ist der TFET nicht durch den thermischen Maxwell-Boltzmann-Träger-Schwanz begrenzt, der den SS von MOSFET auf 60 mV/Dez bei Raumtemperatur [2] (genau 63 mV/Dez bei 300 K) begrenzt. Das Konzept wurde von Chang et al. während seiner Arbeit bei IBM [3]. Zum ersten Mal zeigten Jörg Appenzeller und seine Kollegen bei IBM, dass der SS von TFET unter 60 mV/dez liegen kann. TFET kann als energieeffizienter elektronischer Schalter eingesetzt werden [4], der den Flaschenhals von MOSFETs durchbricht und die Leistungsaufnahme des ICs stark reduziert. Der Herstellungsprozess ist kompatibel mit MOSFETs. Es wird wahrscheinlich den MOSFET-Transistor als Basiseinheit integrierter Schaltkreise der nächsten Generation ersetzen. Daher sind TFETs in den letzten Jahren ein heißes Thema geworden [5, 6]. Um die Leistung von TFETs in Bezug auf SS, Durchlassstrom und Sperrverlust zu verbessern, wurden viele Studien zum Strukturdesign und zur Optimierung von TFET-Bauelementen durchgeführt, die sich hauptsächlich auf die Verbesserung der Strukturform des Bauelementkanals und der Gate-Elektrode konzentrieren [7 ,8,9,10,11,12] und die Gatedielektrikumsmaterialien mit unterschiedlichen Austrittsarbeiten. Die charakteristische Analyse und Strukturoptimierung des Gatedielektrikumsmaterials [13,14,15] und Gatedielektrika mit unterschiedlichen Dielektrizitätskonstanten wurden durchgeführt [15,16,17,18,19,20]. In der Gerätephysik hat die analytische Modellierung von TFETs mit der Double-Gate-Struktur [21,22,23,24,25,26,27] und der umgebenden Gate-Struktur [28,29,30,31,32,33] auch umfangreich durchgeführt worden. Ein Nachteil von siliziumbasierten TFETs gegenüber MOSFETs ist der kleinere Durchlassstrom, und die Höhe des Durchlassstroms wird durch die Effizienz der Tunnelstromerzeugung bestimmt. Die Effizienz der Tunnelstromerzeugung kann erhöht werden, indem die Bandlücke zwischen Valenzband und Leitungsband in dem Bereich verringert wird, der verwendet wird, um den Band-zu-Band-Tunnelstrom zu erzeugen, oder indem die Dicke des Tunnelbereichs verringert wird. Daher wurden in der Materialtechnik TFET-Bauelemente auf der Grundlage von Halbleitermaterialien mit schmalem Bandabstand und Tunnelstrukturen mit Heteroübergang umfassend entwickelt [34,35,36,37,38]. Inzwischen wurde die Einführung von zweidimensionalen Materialien in TFETs als Tunnelschichten mit ultradünner Dicke ausführlich untersucht [39,40,41,42,43,44]. Darüber hinaus wurde in einigen Veröffentlichungen über die Zuverlässigkeit von TFETs berichtet, z Doping auf die Geräteleistungsstörung [47]. Die aktuellen Forschungsergebnisse zielen jedoch hauptsächlich auf die grundlegenden Arbeitseigenschaften und Arbeitsprinzipien einzelner TFETs ab, und der wichtigste grundlegende Zweck der Forschung und Entwicklung von TFETs ist es, eine grundlegende Struktureinheit mit geringerer Leistungsaufnahme bereitzustellen und die bestehende MOSFET-Struktur zu ersetzen . Um dieses grundlegende Ziel zu erreichen, muss es in eine spezielle Schaltung eingebaut werden, um seine Kompatibilität mit der MOSFET-Technologie zu überprüfen. Gegenwärtig wird die auf TFET-Bauelementen basierende Schaltungsentwurfsstrategie nach und nach erforscht, wie z. Es gibt auch Studien zum Design von Hybridschaltungen auf Basis von MOSFETs und TFETs [53]. Allerdings sind die Dotierungstypen des Source-Gebiets und des Drain-Gebiets einander entgegengesetzt, was eine Asymmetrie von Source-Gebiet und Drain-Gebiet erzeugt. Diese asymmetrische Struktur macht es unmöglich, den MOSFET vollständig mit der Source/Drain-Symmetrie zu ersetzen.
Nimm die n -Typ-TFET als Beispiel. Die Seite mit p -Typ Verunreinigung wird als Quellbereich verwendet, während die andere Seite mit n -Typ Verunreinigung wird als der Drain-Bereich verwendet. Wenn die Vorrichtung arbeitet, muss eine positive Potentialdifferenz vom Drain-Gebiet zum Source-Gebiet angelegt werden. Wenn die Source-Elektrode und die Drain-Elektrode vertauscht sind, d. h. die p -Typ-Störstellenbereich ist auf ein höheres Potential im Vergleich zu n . eingestellt -Typ Störstellenregion, dann der PN-Übergang, der durch das p . gebildet wird -Typ-Verunreinigungsregion und n -Störstellenbereich befindet sich immer im positiven Vorspannungszustand, was den Ausfall der Steuerfunktion der Gate-Elektrode verursacht, der TFET ist fast immer im eingeschalteten Zustand und kann nicht ausgeschaltet werden. Mit anderen Worten, es verursacht den Ausfall der TFET-Schaltfunktion. Mit anderen Worten, die Schaltungsfunktionsmodule (wie Transmissionsgatter), die die bidirektionalen Schalteigenschaften von Transistoren nutzen müssen, um normal zu arbeiten, sind mit herkömmlichen TFETs mit asymmetrischer Struktur von Source und Drain schwierig zu realisieren, um diese Probleme zu lösen , schlugen wir einen Source-Drain-symmetrischen und austauschbaren bidirektionalen TFET (B-TFET) vor [54], der den Vorteil der bidirektionalen Schalteigenschaften und der Kompatibilität mit integrierten CMOS-Schaltkreisen im Vergleich zu den traditionellen asymmetrischen TFETs zeigt. In diesem Papier haben wir einen modifizierten bilateralen Gate-gesteuerten B-TFET mit einem planaren Kanal vorgeschlagen. Die Auswirkungen wichtiger Strukturparameter, wie der Dotierungskonzentration des N + Region und P + Region, Länge des N + Region und Länge der intrinsischen Region, von den Geräteleistungen, z. B. den Übertragungseigenschaften, I an –ich aus Ratio und Subthreshold Swing werden anhand physikalischer Analysen detailliert erklärt. Danach werden diese strukturellen Schlüsselparameter optimiert.
Methoden
Abbildung 1a zeigt eine schematische Draufsicht des bilateralen Gate-gesteuerten N-Typ-B-TFET mit einem planaren Kanal. Abbildung 1b zeigt eine Querschnittsansicht des bilateralen Gate-gesteuerten N-Typ-B-TFET. Im Gegensatz zum herkömmlichen TFET ist der vorgeschlagene B-TFET vollständig symmetrisch, Source/Drain austauschbar P + -dotierte Bereiche liegen auf jeder Seite des Siliziumkörpers, und die Gate-Elektrode liegt auf beiden Seiten des Siliziumkörpers. Der gesamte Geräteaufbau ist symmetrisch. Das N + -dotierte Region befindet sich im zentralen Teil des Siliziumkörpers. L und W sind die gesamte Länge bzw. die gesamte Breite der vorgeschlagenen Vorrichtung. L ich die Länge des intrinsischen Bereichs ist; L N+ ist die Länge des N + Region; L S/D und W S/D sind die Länge und Breite des P + jeweils austauschbare Source/Drain-Bereiche; \(T\) ist die Siliziumkörperdicke; \(t_{{{\text{ox}}}}\) ist die Dicke des Gate-Oxids; \(t_{i}\) ist die Dicke des intrinsischen Tunnelgebiets zwischen dem S/D-Gebiet und dem Gate-Oxid.
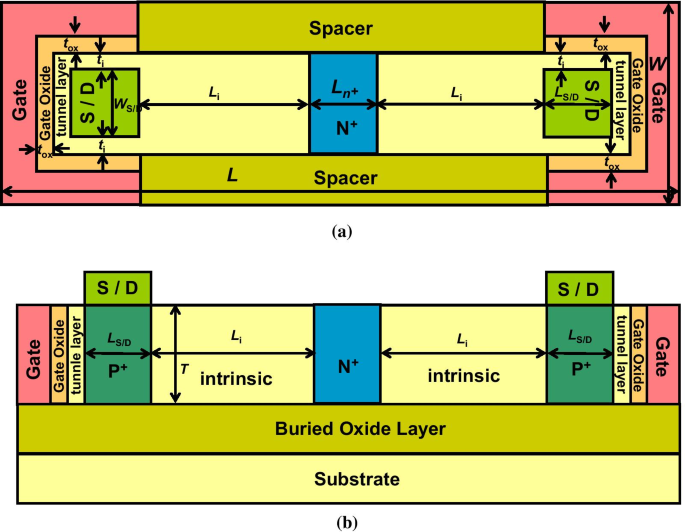
a Schematische Draufsicht des bilateralen Gate-gesteuerten N-Typ B-TFET mit planarem Kanal. b Querschnitt des bilateralen Gate-gesteuerten N-Typ B-TFET
In diesem Papier werden alle physikalischen Modelle wie das Fermi-Statistikmodell, das CVT-Mobilitätsmodell, das Auger-Rekombinationsmodell, das Bandlücken-Verengungsmodell und ein Standard-Band-zu-Band-Tunneling-Modell aktiviert. Alle Parameter des Geräts in diesem Dokument sind in Tabelle 1 aufgeführt.
Ergebnisse und Diskussion
Abbildung 2a, b zeigen die Übertragungskennlinie, das \(I_{{\text{on}}}}{-}I_{{{\text{off}}}}\) Verhältnis und den durchschnittlichen SS mit verschiedenen \(N_{ D}\) (\(10^{18}\)–\(10^{21} \,{\text{cm}}^{ - 3}\)). In Fig. 2a beeinflusst \(N_{D}\) die Intensität des in Sperrrichtung vorgespannten Drain-Source-Leckstroms. Mit der Erhöhung der Dotierungskonzentration wird der Leckstrom deutlich unterdrückt und der Durchlassstrom ändert sich nicht wesentlich. In Abb. 2b werden die SS und \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) auch von \(N_{D}\) beeinflusst. ). Mit der Zunahme der Dotierungskonzentration nimmt der Strom am statischen Arbeitspunkt ab, da der Rückwärtsleckstrom signifikant unterdrückt wird, so dass auch der durchschnittliche SS abnimmt. Da der Vorwärtsstrom viel weniger beeinflusst wird als der Rückwärtsstrom, steigt das Verhältnis \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) mit der Zunahme in der Dopingkonzentration. Abbildung 2c, d zeigen die zweidimensionalen Potenzialverteilungen des vorgeschlagenen B-TFET mit \(N_{D}\) gleich 10 19 cm −3 und 10 21 cm −3 , bzw. Wenn die Gate-Elektrode in Sperrrichtung vorgespannt ist, wird zwischen der in Vorwärtsrichtung vorgespannten Drain-Elektrode und der in Sperrrichtung vorgespannten Gate-Elektrode ein starkes elektrisches Feld erzeugt, was zu einem starken Band-zu-Band-Tunneln in der Nähe des Drain-Bereichs führt. Unter den resultierenden erzeugten Elektron-Loch-Paaren können die Elektronen direkt aus der Drain-Elektrode fließen, während die Valenzbandlöcher durch das N + . fließen müssen Bereich, nachfolgend an den intrinsischen Bereich auf der Source-Seite und durch die Source-Elektrode entladen werden, um den kontinuierlichen Leckstrom zu bilden. Um den Leckstrom zu minimieren, sollten die durch Band-zu-Band-Tunneln erzeugten Löcher effektiv daran gehindert werden, aus dem N&spplus;+&spplus;-Gebiet herauszufließen. Im Vergleich zum N + -Gebiet mit niedrigerer Konzentration bildet das N + -Gebiet mit höherer Konzentration eine größere Potenzialdifferenz zwischen P + -Gebiet und N + -Gebiet, dh der Potenzialwert an der Grenze zwischen dem intrinsischen Gebiet und dem N + -Gebiet wird größer mit der Zunahme von \(N_{D}\), da die N + -Region mit höherer Konzentration einen größeren Elektronenkonzentrationsunterschied zwischen Source und Drain erzeugen kann. Dann können mehr Elektronen von der N + -Region in die intrinsischen Regionen auf beiden Seiten der N + -Region diffundiert werden, was die Menge an positiver Ladung (hauptsächlich aus Donor) in der N + -Region nach der Ionisierung erhöht und folglich das Potential erhöht Unterschied zwischen der P + -Region und der N + -Region. Gerade weil das N + -Gebiet mit höherer Dotierungskonzentration nach der Ionisation ein höheres Potential hat als sowohl die Source- als auch die Drain-Seite, können die durch das Band-zu-Band-Tunneln in der Nähe des Drain-Gebiets erzeugten Löcher effektiver blockiert werden, was die Ableitstrom.
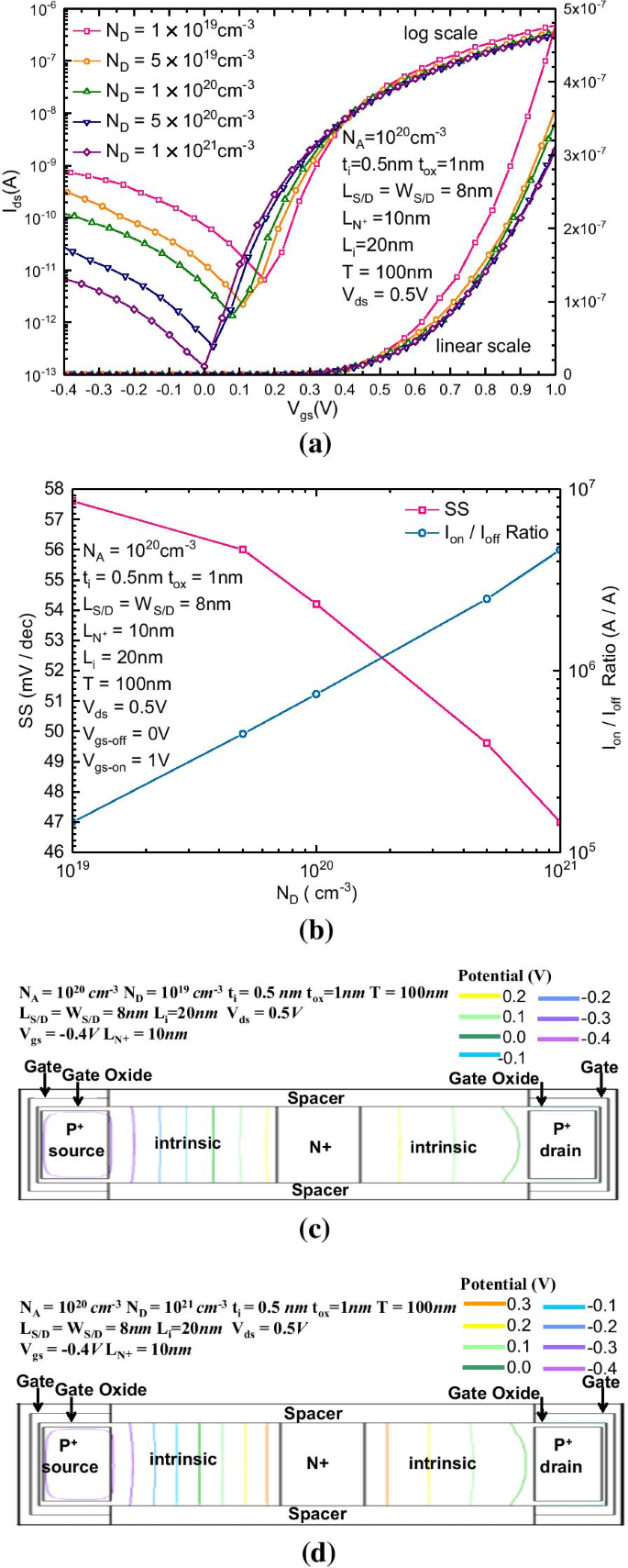
a \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) Übertragungseigenschaften und b Variation in SS und dem \(I_{{{\text{on}}}}}{-}I_{{{\text{off}}}}\) Verhältnis des vorgeschlagenen B-TFET mit verschiedenen \(N_{D }\); die umgekehrt vorgespannte 2-dimensionale Potentialverteilung mit c N D = 10 19 cm −3 und d N D = 10 21 cm −3
Neben der Dotierungskonzentration des N + -Gebiets ist die Länge des N + -Gebiets ein weiterer wichtiger Parameter des N + -Gebiets, das den in Sperrrichtung vorgespannten Leckstrom signifikant beeinflussen kann. Abbildung 3a, b zeigen die \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\)-Übertragungseigenschaften des vorgeschlagenen B-TFET mit verschiedenen L N+ . Der in Sperrrichtung vorgespannte Leckstrom nimmt mit zunehmendem L . stark ab N+ . Wie Abb. 2b zeigt, werden der unterschwellige Swing und \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) auch von L<. beeinflusst /i> N+ . Mit der Zunahme von L N+ , da der Rückwärtsleckstrom deutlich unterdrückt wird, werden auch der Strom im statischen Arbeitspunkt und der durchschnittliche SS reduziert. Der Vorwärtsstrom wird weit weniger beeinflusst als der Rückwärtsleckstrom, und das Verhältnis \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) steigt mit der Zunahme in L N+ . Abbildung 3c, d zeigen die zweidimensionale Lochkonzentrationsverteilung des vorgeschlagenen B-TFET mit L N+ gleich 2 nm bzw. 80 nm. Wenn L N+ gleich 2 nm ist, ist die minimale Lochkonzentration in der N + -Region größer als 10 17 cm −3 , während wenn L N+ gleich 80 nm ist, beträgt die minimale Lochkonzentration weniger als 10 14 cm −3 . Die Zunahme der Länge des N + -Gebiets verbessert seine Fähigkeit, zu verhindern, dass Löcher durch das N + -Gebiet hindurchgehen. Als Nichtgleichgewichts-Minoritätsträger in der N + -Region werden bei längerer N + -Region mehr Löcher mit Elektronen rekombiniert, bevor sie die N + -Region passieren, so dass die Längenzunahme der N + -Region auch a . bilden kann kontinuierlicher in Sperrrichtung vorgespannter Leckstrom. Der durchschnittliche SS kann auf 40,2 mV/dec reduziert werden, und das Verhältnis \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) kann 10<. überschreiten sup> 10 .
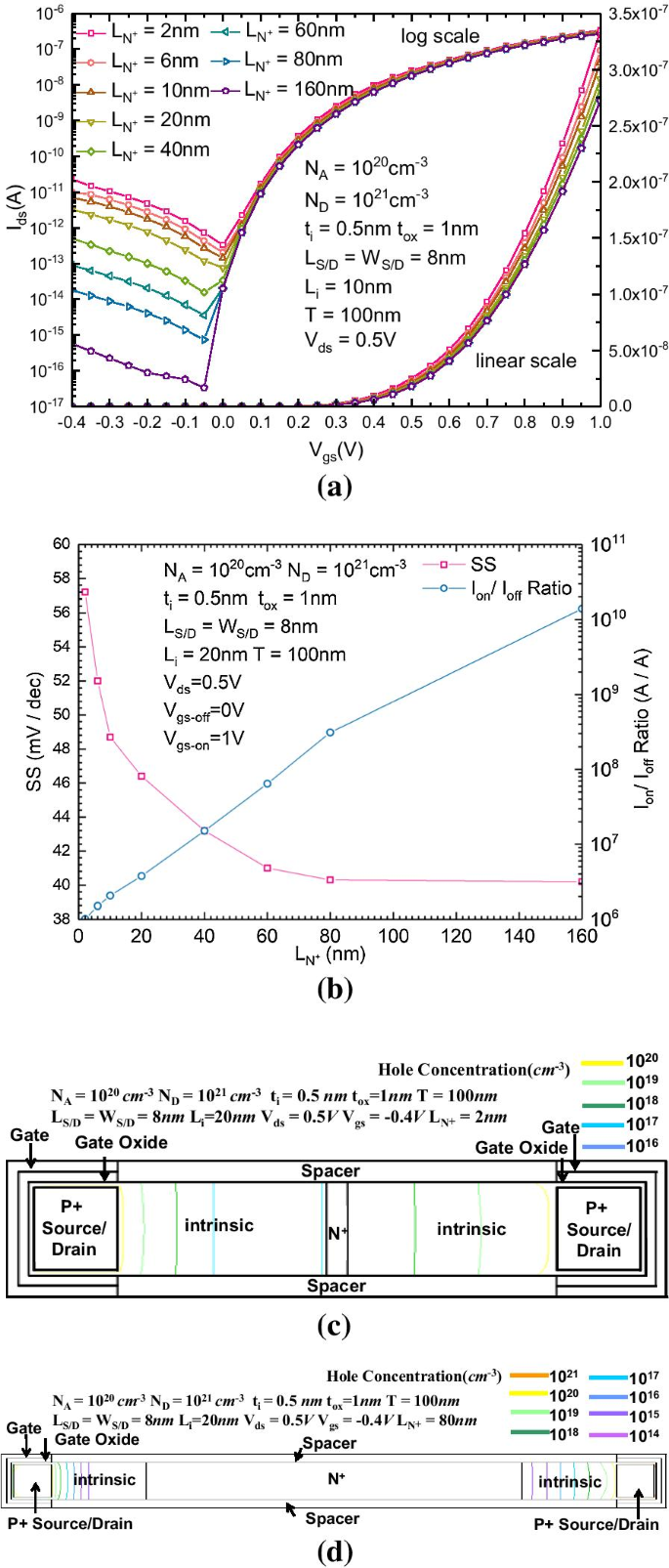
a \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}}\) Eigenschaften; b Variation der SS und des \(I_{{{\text{on}}}}}{-}I_{{{\text{off}}}}\) Verhältnisses des vorgeschlagenen B-TFET mit verschiedenen L N+; 2-dimensionale Lochkonzentrationsverteilung des vorgeschlagenen B-TFET unter Sperrspannung für L N+ gleich (3) 2 nm und (4) 80 nm
Abbildung 4a, b zeigen die \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\)-Übertragungseigenschaften und Änderungen in SS und \(I_{{{ \text{on}}}}{-}I_{{{\text{off}}}}\) Verhältnis des vorgeschlagenen B-TFET mit unterschiedlichem L ich , bzw. Der Durchlassstrom nimmt mit zunehmendem L . ab ich weil der Widerstand des intrinsischen Bereichs proportional zu seiner Länge ist. Um den Durchlassstrom zu maximieren, sollte dann die Länge des intrinsischen Bereichs minimiert werden. Die Abnahme der Länge des intrinsischen Gebiets verstärkt jedoch das elektrische Feld im intrinsischen Gebiet zwischen dem Source-P + -Gebiet und dem N + -Gebiet, so dass die Bandbiegung in der Nähe dieses Gebiets größer ist als das intrinsische Gebiet in der Nähe der Drain-Elektrode, was zu mehr in Sperrrichtung vorgespannter Leckstrom. Abbildung 4c, d zeigen die zweidimensionale, in Sperrrichtung vorgespannte Potenzialverteilung des vorgeschlagenen B-TFET für L ich gleich 4 nm bzw. 100 nm. Für das kürzeste L ich (4 nm) ist das elektrische Feld im intrinsischen Bereich zwischen dem Source-P + -Bereich und dem N + -Bereich nahe der Source-Elektrode viel stärker als im intrinsischen Bereich zwischen dem Drain-P + -Bereich und dem N + -Bereich nahe der Drain-Elektrode. Dann bleibt der Leckstrom nahezu konstant, was unabhängig von der Änderung der Gatespannung ist. Abbildung 4b zeigt, dass der optimale Wertebereich von L ich beträgt ungefähr 7–10 nm, wobei die SS auf einen Talwert von 41 mV/dec abfällt und die \(I_{{{\text{on}}}}{-}I_{{{\text{off}}} }\) Verhältnis steigt auf einen Maximalwert von fast 10 8 .
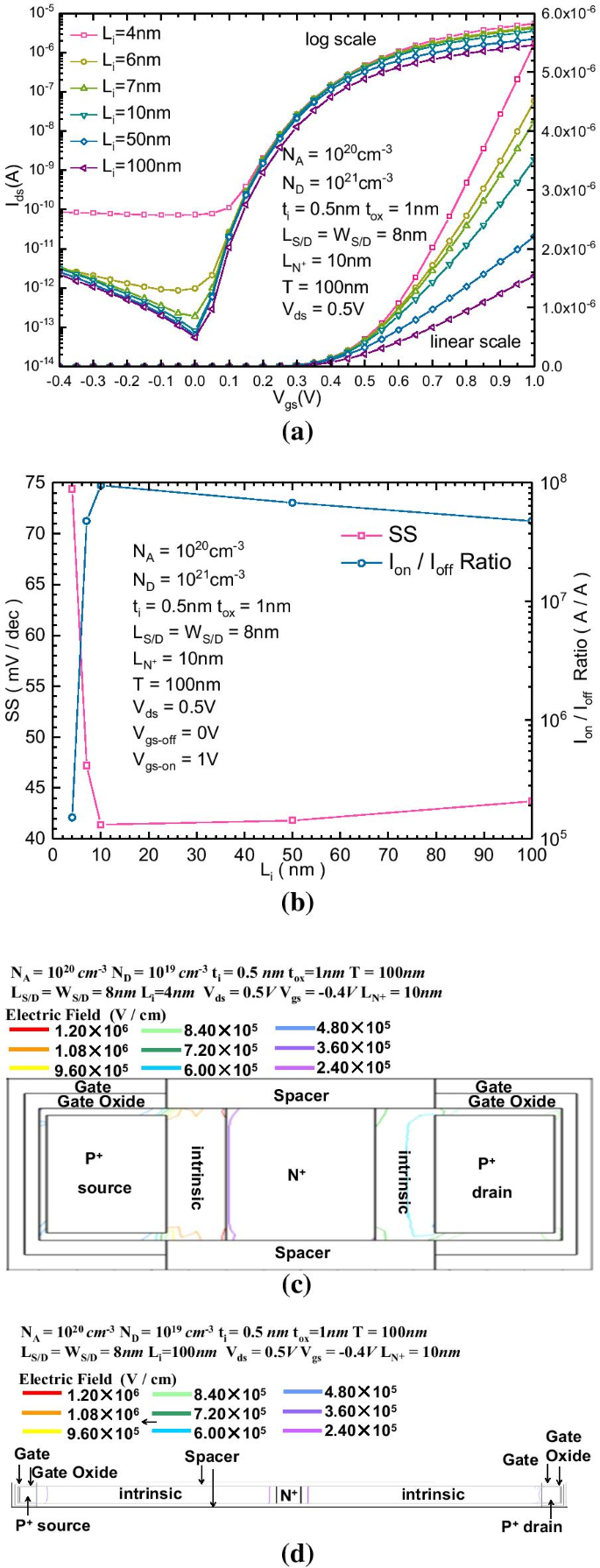
a \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) Eigenschaften von B-TFET und b Variation in SS und dem \(I_{{{\text{on}}}}}{-}I_{{{\text{off}}}}\) Verhältnis mit verschiedenen \(L_{i}\); 2-dimensionale umgekehrt vorgespannte Potentialverteilung des vorgeschlagenen B-TFET für L ich gleich c 20 nm und d 100 nm
Abbildung 5a, b zeigen die \(I_{{{\text{ds}}}}{-}V_{{{\text{ds}}}}\)-Übertragungseigenschaften und die Änderung von SS und \(I_{{{ \text{on}}}}{-}I_{{{\text{off}}}}\) Verhältnis des vorgeschlagenen B-TFET mit verschiedenen \(N_{A}\). Abbildung 5a zeigt, dass wir durch Erhöhen der Konzentration des P + -dotierten Bereichs weniger SS und einen größeren Durchlassstrom erhalten können. Der in Sperrrichtung vorgespannte Leckstrom wird offensichtlich nicht durch die Änderung von \(N_{A}\) beeinflusst, aber der Durchlassstrom kann mit der Zunahme von \(N_{A}\) erhöht werden. In Abb. 5b können sowohl das SS- als auch das \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\)-Verhältnis verbessert werden, indem \(N_{A }\). Abbildung 5c, d zeigen die zweidimensionale Verteilung des elektrischen Felds des vorgeschlagenen B-TFET mit \(N_{A}\) gleich 10 19 cm −3 und 10 21 cm −3 , bzw. Die Zunahme von \(N_{A}\) verstärkt das elektrische Feld in der intrinsischen Tunnelregion; dann können durch Band-zu-Band-Tunneln mehr Elektron-Loch-Paare erzeugt werden, was den Durchlassstrom des vorgeschlagenen B-TFET erhöht.
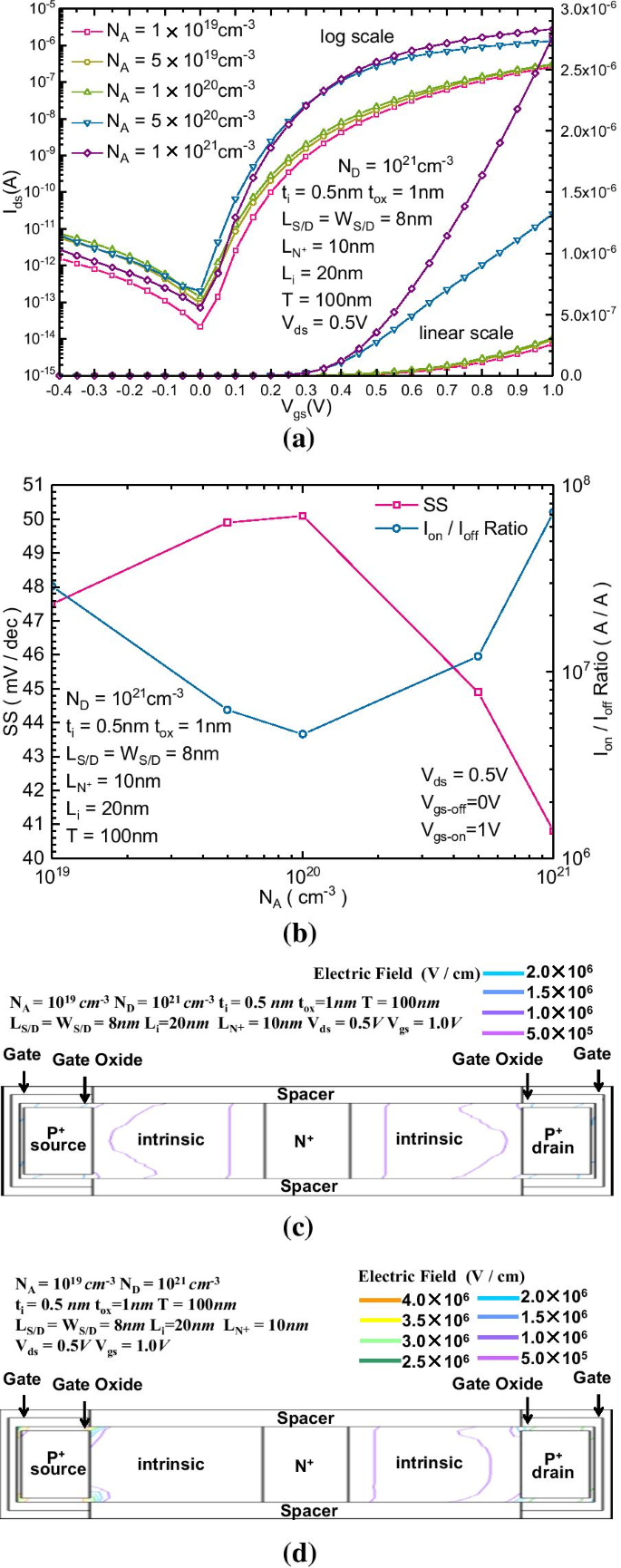
a \(I_{{{\text{ds}}}}{-}V_{{{\text{gs}}}}\) Übertragungseigenschaften, b Variation in SS und \(I_{{{\text{on}}}}}{-}I_{{{\text{off}}}}\) Verhältnis des vorgeschlagenen B-TFET mit verschiedenen \(N_{A} \). Zweidimensionale umgekehrt vorgespannte elektrische Feldverteilung des vorgeschlagenen B-TFET für \(N_{A}\) gleich (3) 10 19 cm −3 und (4) 10 21 cm −3
Gemäß der obigen Diskussion sollten sowohl \(N_{D}\) als auch \(N_{A}\) auf den maximal möglichen Wert gesetzt werden. Der optimale Wertebereich von L ich beträgt 7–10 nm. Es gibt jedoch einen Kompromiss zwischen dem statischen Stromverbrauch und L N+ . Abbildung 6 zeigt die \(I_{{\text{ds}}}}{-}V_{{{\text{ds}}}}\)-Übertragungseigenschaften des optimierten B-TFET mit unterschiedlichen L N+ . L N+ kann entsprechend den unterschiedlichen Designanforderungen des statischen Stromverbrauchs ausgewählt werden. Als Kompromiss, um sicherzustellen, dass das Verhältnis \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\) über 10 8 , LN+ wird empfohlen, über 20 nm zu liegen. Der Einschaltstrom wird auf ungefähr 6 × 10 –6 . erhöht A, und die SS wird auf 38 mV/dez reduziert.
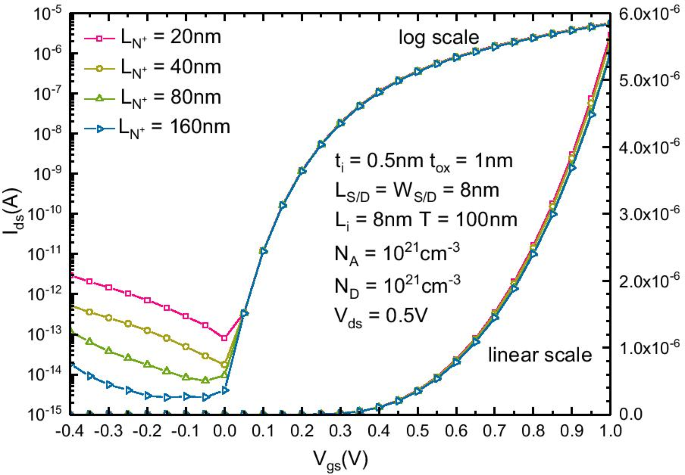
\(I_{{{\text{ds}}}}{-}V_{{{\text{ds}}}}\) Übertragungseigenschaften des optimierten B-TFET mit verschiedenen LN+
Schlussfolgerungen
In dieser Arbeit werden die Auswirkungen der strukturellen Parameter und des internen Mechanismus eines bilateralen Gate-gesteuerten S/D-symmetrischen und austauschbaren bidirektionalen Tunnel-Feldeffekttransistors analysiert. Die Auswirkungen der Schlüsselparameter wie Konzentration und Länge der N + -Region, Länge der intrinsischen Region zwischen den P + - und N + -Regionen und Konzentration der P + -Region wurden ausführlich diskutiert. Verglichen mit dem herkömmlichen TFET hat der B-TFET den Vorteil eines starken Widerstands gegenüber dem in Sperrrichtung vorgespannten Leckstrom. Danach kann eine gute Leistung wie ein niedrigerer durchschnittlicher SS und ein höheres \(I_{{{\text{on}}}}{-}I_{{{\text{off}}}}\)-Verhältnis erhalten werden. Darüber hinaus ist es aufgrund der strukturellen Symmetrie und der austauschbaren Source/Drain- und bidirektionalen Schalteigenschaften besser mit der CMOS-Schaltung kompatibel.
Verfügbarkeit von Daten und Materialien
Eine Erklärung zur Verfügbarkeit von Daten und Material haben wir für uns und im Namen unserer Mitautoren unter „Konkurrierende Interessen“ aufgenommen. Alle verfügbaren Daten und Materialien sind Originalarbeiten. Alle Daten wurden im Manuskript ohne zusätzliche Daten und unterstützende Materialien eindeutig bereitgestellt.
Abkürzungen
- L :
-
Gesamtlänge des vorgeschlagenen Geräts
- W :
-
Gesamte Breite des vorgeschlagenen Geräts
- L ich :
-
Länge der intrinsischen Region
- L N + :
-
Länge des N + Region
- L S / D :
-
Länge des P + austauschbare Source/Drain-Regionen
- W S / D :
-
Breite des P + austauschbare Source/Drain-Regionen
- \(T\) :
-
Dicke des Siliziumkörpers
- \(t_{{{\text{ox}}}}\) :
-
Dicke des Gateoxids
- \(t_{i}\) :
-
Dicke des intrinsischen Tunnelbereichs zwischen S/D-Bereich und Gateoxid
- MOSFET:
-
Metalloxid-Halbleiter-Feldeffekttransistor
- TFET:
-
Tunnel-Feldeffekttransistor
Nanomaterialien
- Die Shockley-Diode
- First-Principles-Studie zur Stabilität und dem STM-Image von Borophen
- Auswirkung der Verteilung von Goldnanopartikeln in TiO2 auf die optischen und elektrischen Eigenschaften von farbstoffsensibilisierten Solarzellen
- Die Wirkung von Kontakt-Nichtgleichgewichtsplasma auf die strukturellen und magnetischen Eigenschaften von Mn Х Fe3 − X О4 Spinellen
- Auswirkung einer In-situ-Annealing-Behandlung auf die Mobilität und Morphologie von TIPS-Pentacen-basierten organischen Feldeffekttransistoren
- Experimentelle Studie zu den Strömungs- und Wärmeübertragungseigenschaften von TiO2-Wasser-Nanofluiden in einem spiralförmig geriffelten Rohr
- TiO2-Nanoröhren-Arrays:Hergestellt durch weiche-harte Schablone und die Korngrößenabhängigkeit der Feldemissionsleistung
- Studie über den mehrstufigen Widerstandsschaltspeicher und die speicherzustandsabhängige Photospannung in Pt/Nd:SrTiO3-Übergängen
- Design und Anpassung der Graphen-Austrittsarbeit durch Größe, Modifikation, Defekte und Dotierung:eine Theoriestudie des ersten Prinzips
- Eine Studie zu Kohlenstoffnanofasern und Aktivkohle als symmetrischer Superkondensator in wässrigem Elektrolyt:Eine Vergleichsstudie



