Retentionsmodell von TaO/HfO x und TaO/AlO x RRAM mit selbstrichtenden Schaltereigenschaften
Zusammenfassung
Ein Retentionsverhaltensmodell für selbstkorrigierendes TaO/HfO x - und TaO/AlO x -basierter resistiver Direktzugriffsspeicher (RRAM) wird vorgeschlagen. Ein RRAM vom Einfangtyp kann einen hochohmigen Zustand (HRS) und einen niederohmigen Zustand (LRS) aufweisen; die Verschlechterung bei einem LRS ist normalerweise schwerwiegender als bei einem HRS, da der LRS während des SET-Prozesses durch die interne Widerstandsschicht begrenzt wird. Wenn jedoch TaO/AlO x Elemente in Schichten gestapelt werden, kann die LRS-Retention verbessert werden. Die nach der Extrapolationsmethode geschätzte LRS-Retentionszeit beträgt mehr als 5 Jahre bei Raumtemperatur. Sowohl TaO/HfO x - und TaO/AlO x -basierte RRAM-Strukturen haben dieselbe Deckschicht aus TaO und die Aktivierungsenergieniveaus beider Arten von Strukturen betragen 0,38 eV. Darüber hinaus ist das zusätzliche AlO x Schaltschicht eines TaO/AlO x Struktur eine höhere O-Diffusionsbarriere erzeugt, die die Retention wesentlich verbessern kann, und die TaO/AlO x Struktur zeigt auch unter verzerrten Bedingungen ein recht stabiles LRS.
Hintergrund
Da die NAND-Flash-Technologie an eine Skalierungsgrenze stößt, sind VRRAM-Designs (vertikal resistiver Direktzugriffsspeicher) mit niedrigen Filmstapeln, hohen Fertigungsausbeuten und keinen Kreuzkopplungsproblemen vielversprechende Kandidaten für Speicheranwendungen mit hoher Dichte [1,2,3 ]. Die 1TnR-Architektur mit dreidimensionaler (3D) vertikaler Struktur trägt dazu bei, extrem niedrige Bitkosten für hochkompakte dichte Arrays zu realisieren [4,5,6]. Mehrere Forscher haben vorgeschlagen, RRAM bei niedrigen Strompegeln zu betreiben, indem sie den Widerstandsschaltmechanismus von einem fadenförmigen zu einem Leiterbahnmodell vom Defekteinfang-, Leerstellen-Modulations- oder Grenzflächentyp ändern [7,8,9]. Die zentralen Fragen von Retentionsfehlern und der Migration von Sauerstoffleerstellen sind jedoch noch ungelöst [3, 10]. In einigen Retentionsstudien vom Filamenttyp wurden viele verschiedene Modelle vorgeschlagen, um Retentionsverluste zu erklären [11,12,13]. Der Wechsel des Switching-Mechanismus weist auch auf eine andere Richtung hin, die die Retention verbessern könnte [11]. Unsere früheren Studien haben gezeigt, dass TaO/HfO x Geräte können günstige Nichtlinearitätswerte von etwa 40, Lebensdauerwerte von mehr als 1000 Zyklen und eine Datenspeicherung von 85 °C aufweisen [6, 7]. Dennoch ist es immer noch eine Herausforderung, eine stabile Retention bei solch niedrigen Betriebsstrompegeln zu erreichen. In diesem Brief wird ein Retentionsmodell vorgeschlagen, um den Retentionsverlust in zwei verschiedenen Vorrichtungen vom Defekteinfangtyp mit der Arrhenius-Methode zu realisieren. Die extrahierte Aktivierungsenergie erklärt die Retentionsverbesserung durch das AlO x . nicht überzeugend Schicht. Obwohl das Original mehrdeutig war, ist die wahrscheinlichste Interpretation, dass eine dichte Bindung die Retention erleichtert.
Methoden
Bei der Herstellung von TaO/HfO x und TaO/AlO x Geräten für die vorliegende Studie besteht die untere Elektrode (BE) aus TiN-Metall, das durch physikalische Gasphasenabscheidung (PVD) auf 8-in. thermische Oxid/Si-Substrate. Jedes BE wurde mit einem herkömmlichen Lithographie- und Ätzverfahren strukturiert und geätzt. Nachdem jedes TiN BE mit chlorhaltigem Gas geätzt wurde, wurden der verbleibende Photoresist (PR) und die Ätzrückstände mit einem Remote-Plasmasystem entfernt, das O2 . aufbrachte und H2 O bei 180 °C. Während des PR-Entfernungsprozesses wurde auf der Oberfläche jedes TiN-BE eine dünne Oxidationsschicht aus TiON gebildet. Dann Widerstandsschaltschichten aus HfO x und AlO x wurden durch Atomlagenabscheidung (ALD) mit HfCl4 . hergestellt -H2 O und TMA-H2 O-Vorstufen bzw. Die beiden Widerstandselemente HfO x und AlO x wurden bei 300 und 250 °C abgeschieden. Auf den ohmschen Schaltschichten wurde dann die TaO-Schicht durch PVD durch Niedertemperatur-Plasmaoxidation (LTPO) abgeschieden [14]. Bei dieser Herstellung wird Ta-Metall mit einer extrem niedrigen Rate (0,2 Å/s) abgeschieden. Eine stabile Plasmaoxidation wurde mit einer Mischung aus Ar und O2 . durchgeführt Gase. Diese TaO-Schicht diente als interner Selbst-Compliance-Widerstand, der im Vergleich zu früheren resistiven Schaltfilmen relativ undicht war [7]. Die obere Elektrode war ebenfalls PVD-TiN. Die Querschnittsansichten und Dickeninformationen des TaO/HfO x und TaO/AlO x Speichervorrichtungen sind in Fig. 1a bzw. b veranschaulicht. Die Filmdicke von TaO/HfO x wurde durch Transmissionselektronenmikroskopie (nicht gezeigt) überprüft. Nach der Strukturierung der Zellen wurde das Niedertemperaturoxid zur Passivierung bei 250 °C abgeschieden. Schließlich wurde ein konventioneller Back-End-Prozess angewendet, um die Herstellung von Kontakt- und Metallpadstrukturen abzuschließen.

Zellenschemadiagramme mit Dickeninformationen für a TaO/HfO x Geräte und b TaO/AlO x Geräte. Beide Diagramme beschreiben Vorrichtungen, bei denen PVD die TaO-Schichten mit LTPO-Prozessen abgeschieden hat und die unteren TiON-Grenzflächenschichten durch Plasmaoxidation während der Photoresistentfernung gebildet wurden
Ergebnisse und Diskussion
Die elektrischen Messungen wurden mit einem HP4156C Halbleiterparameteranalysator durchgeführt. Die eingestellte und zurückgesetzte Stromdichte (J ) gegen Spannung (J –V ) Kurven von TaO/HfO x und TaO/AlO x Geräte sind in Abb. 2a bzw. b gezeigt. Beide anfänglichen Widerstandszustände (R initial ) des TaO/HfO x und TaO/AlO x Geräte waren HRS. Die jungfräulichen Speicherbauelemente wurden auf LRS mit positiver Vorspannung programmiert und wurden zurückgewobbelt. Dann wurde jede Zelle durch angelegte negative Spannung von LRS auf HRS umgeschaltet. Sowohl J–V Diagramme enthalten drei Zellgrößen, nämlich 0,1, 0,56 und 25 μm 2 . Im J–V Plots ähneln sich alle Kurven von Geräten mit unterschiedlichen Bereichen, was sowohl TaO/HfO x . anzeigt und TaO/AlO x Geräte hatten (i) die gleiche Stromdichte im Anfangszustand, (ii) ähnliche Einstell- und Rücksetzspannungen und (iii) die gleiche Stromdichte in LRS und HRS. Darüber hinaus wird die Eigenschaft der konstanten Stromdichte durch den Widerstand gegenüber der Fläche (R –A ) Diagramme in Abb. 2c, d. Die starke Flächenabhängigkeit in beiden R initial und LRS können durch die Steuerung der Stromdichte beobachtet werden. Unabhängig von der Größe der Zellenfläche und des Compliance-Stroms wird in beiden Geräten das gleiche Ein-/Aus-Widerstandsverhältnis beibehalten. Diese Schaltcharakteristik mit konstanter Stromdichte impliziert, dass die Speicherzellen durch das elektrische Feld gleichförmig programmiert oder gelöscht werden. Es wird angenommen, dass diese Bauelemente Schalteigenschaften vom Einfangtyp haben, die stark mit der Modulation von Leerstellen zusammenhängen [8]. Im Fall von RRAM vom Einfangtyp wurde kein scharfer Stromsprung während des Setzprozesses beobachtet, jedoch wurden allgemein scharfe Stromsprünge für RRAM vom Fadentyp beobachtet. In der vorliegenden Untersuchung wurden unterschiedliche Schaltspannungen für die verschiedenen Schaltschichten mit HfO x . beobachtet oder AlO x . Der eingestellte Spannungsbereich eines TaO/AlO x Gerät hat 4 bis 4,5 V, was größer ist als die eines TaO/HfO x Gerät (3 bis 4 V). Der Rücksetzspannungsbereich eines TaO/AlO x Gerät ist −1,5 bis −2,5 V, was größer ist als die eines TaO/HfO x Gerät (–0,5 bis –1,5 V). Ein AlO x System verbraucht mehr Energie, um die Set- und Reset-Schalter abzuschließen als ein HfO x System verbraucht. Beim Setzen von Schaltern werden die Schaltschichten HfO x und AlO x weiche Durchbrüche bei Spannungen von ungefähr 3 bzw. 3,5 V erreichen. Bei beiden Arten von Vorrichtungen wird der Strom durch den Innenwiderstand der TaO-Schicht begrenzt, bevor sich Filamente in der Schaltschicht bilden. Während des Selbst-Compliance-Prozesses von RRAM vom Trapping-Typ werden übermäßige Sauerstoffleerstellen innerhalb der Schaltschicht erzeugt [7]. Diese Sauerstoffleerstellen werden während des negativen Vorspannungsrücksetzprozesses rekombiniert. Im Gegensatz zum RRAM vom Filamenttyp ist die HRS nach einem Reset-Vorgang immer niedriger als der anfängliche Widerstandszustand (IRS) [15,16,17]. Zusammenfassend ist Defekt-Trapping ein Prozess, der Leerstellen durch Sauerstoff-Ion-Leerstellen-Rekombination moduliert, um die Widerstandsvariation in der Schaltschicht zu kontrollieren. Verglichen mit einem HfO x Schaltschicht, Defekteinfang verursacht höhere Spannung und Leistung in der AlO x Schicht sowohl beim Setzen als auch beim Zurücksetzen eines Schalters.
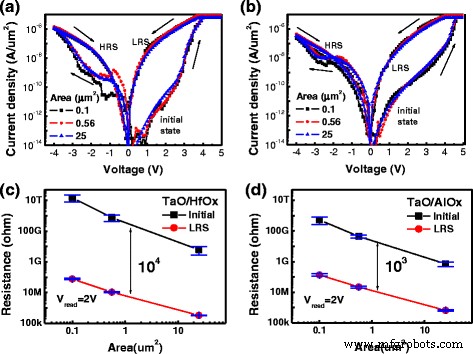
Stromdichte mit Spannungskurve von a TaO/HfO x Geräte mit unterschiedlichen Zellgrößen. b TaO/AlO x Geräte mit unterschiedlichen Zellgrößen. Der Widerstand gegen die Fläche von c a TaO/HfO x Gerät und d a TaO/AlO x Gerät. Beide Diagramme enthalten IRS und LRS mit einer Lesespannung = 2 V. Jeder Datenpunkt liefert den Durchschnitt von 10 Geräten und die entsprechende Standardabweichung
Nachdem das Schaltverhalten untersucht worden war, wurde das HRS- und LRS-Retentionsverhalten der Speichereinheiten vom Trapping-Typ untersucht. Die Diagramme der Widerstandsvariation gegen die Zeit bei 85 °C und 1 V für TaO/HfO x und TaO/AlO x Geräte sind in Abb. 3a, b gezeigt. In beiden Diagrammen ist die LRS-Variation stärker ausgeprägt als die HRS-Variation. Die Widerstandsstabilität von TaO/AlO x ist höher als die von TaO/HfO x . Die Abbildungen veranschaulichen, dass die HRS für beide Gerätetypen tendenziell in Richtung der IRS abdriften; die IRS sind in Abb. 3a, b durch gestrichelte Linien gekennzeichnet. Der Trend des Widerstands, der in den Neuzustand des Geräts zurückkehrt, ist in Abb. 3c für TaO/AlO x . dargestellt und in Abb. 3d für TaO/HfO x . Um dies zu realisieren, wurden beide Gerätetypen zunächst auf LRS bei Raumtemperatur programmiert, wie im I–V . gezeigt fegt (schwarze Linie). Dann wird das TaO/AlO x und TaO/HfO x Geräte wurden in Öfen bei 150 °C für 48 h bzw. bei 120 °C für 120 h gebacken. Für beide Fälle gilt das I–V Sweep nach dem Backen war ähnlich dem ersten Sweep. Durch dieses Verfahren wurden die LRSs von Vorrichtungen vom Einfangtyp nach einiger Zeit in einer Hochtemperaturumgebung in den ursprünglichen Zustand zurückversetzt. Im Gegensatz zu Vorrichtungen vom Filamenttyp, die eine bemerkenswerte Bewegung von Sauerstoffatomen aufweisen, haben Vorrichtungen vom Einfangtyp Paare von Sauerstoffionen und Leerstellen, die durch kurze Distanzen getrennt sind. Die Tendenz des Widerstandsdriftens in den Anfangszustand hängt mit seiner ursprünglichen Kristallinität zusammen, die hauptsächlich durch die Prozesstemperatur von ALD gesteuert wird. Als Ergebnis können die LRSs in beiden Gerätetypen durch negative Vorspannung oder thermische Energie auf HRSs (oder IRSs) zurückgesetzt werden. Diese Eigenschaft ist bei filamentösem RRAM anders.
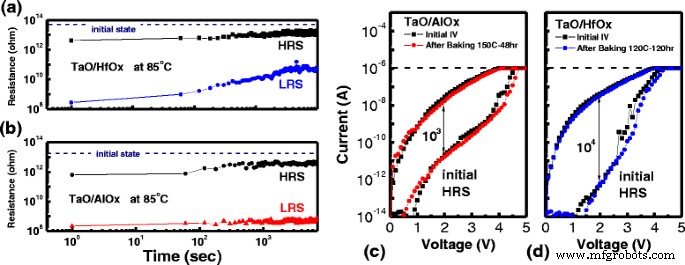
Diagramme der Widerstandsvariation gegen die Zeit für a TaO/HfO x und b TaO/AlO x Geräte. Beide Diagramme enthalten die HRS- und LRS-Variation bei der Ablesespannung = 1 V bei 85 °C. Nach dem Ich –V Sweeps jedes neuen Geräts wurden eingestellt, das Gerät wurde gebacken und dann wieder auf LRS programmiert:c TaO/AlO x (150 °C für 48 h); d TaO/HfO x (120 °C für 120 h)
Beim Standard-Aufbewahrungstest für nichtflüchtigen Speicher wird die Datenaufbewahrung sowohl bei Raumtemperatur als auch bei hoher Temperatur getestet; Geräte müssen in der Lage sein, Daten sowohl bei Raumtemperatur als auch bei hoher Temperatur zu speichern, um in realen Anwendungen nützlich zu sein. Aktivierungsenergie (E a ) ist die Extraktion nach der Arrhenius-Methode im Retentions-Plot eine gängige Methode zur Bewertung der Datenretention [18, 19]. Wie in Abb. 3a zu sehen ist, ist die LRS-Variation ausgeprägter als die HRS-Variation. Daher ist das Widerstandsverhältnis (R Verhältnis ) von LRS gegen die Backzeit bei Temperaturen im Bereich von 30 bis 150 °C wurde analysiert. Ein Beispiel für die Extraktion der Retentionszeit aus einem TaO/AlO x Gerät ist in Abb. 4a gezeigt. Die Widerstandsabbaurate kann durch die Steigung der linearen Anpassung in log(R Verhältnis )-log(Zeit)-Skala. Unter Berücksichtigung des maximalen Ein-/Aus-Widerstandsverhältnisses von ungefähr 10 3 für ein TaO/AlO x Gerät, wie in Abb. 3c gezeigt, eine Retentionszeit von 10 3 mal die LRS-Variation berechnet werden kann. Die geschätzte LRS-Datenspeicherung bei Messtemperaturen von 30 bis 150 °C ist in Abb. 4b dargestellt. Jeder Datenpunkt repräsentiert Informationen von mehr als 18 Geräten für beide Gerätetypen. In einem TaO/AlO x Gerät beträgt die Datenspeicherung bis zu 10 6 s bei 150 °C und 2 × 10 8 s (ungefähr 5 Jahre) bei Raumtemperatur; diese Zeiten sind fast 10 1,5 mal länger als die eines TaO/HfO x Gerät. Der interessanteste Punkt ist, dass sowohl TaO/HfO x und TaO/AlO x Geräte zeigen das gleiche E a = 0,38 eV, berechnet aus der extrahierten Steigung. Das gleiche E a impliziert, dass beide Gerätetypen ähnliche chemische Reaktionen im LRS-Abbauprozess durchlaufen. Dieses E a ist an allen thermisch aktivierten kinetischen Prozessen beteiligt, einschließlich der Freisetzung von Sauerstoffionen in der Nähe von TaO-Grenzflächen und den Sauerstoffdiffusionsprozessen in AlO x und HfO x Schichten. Die Sauerstoff-Selbstdiffusionskoeffizienten von HfO x und AlO x Schichten unterscheiden sich bei hohen Temperaturen (>1000 °C); genaue Messungen finden sich in der Literatur [20, 21]. Der Sauerstoffdiffusionskoeffizient bei niedriger Temperatur (<200 °C) hängt auch von der Dicke des HfO x . ab Dielektrika [22]. Dominieren die Diffusionsprozesse in Schaltschichten die chemische Reaktion, dann ist das E a die Werte sollten aufgrund der unterschiedlichen Diffusionskoeffizienten in HfO x . unterschiedlich sein und AlO x Schichten. Beide Gerätetypen in dieser Arbeit zeigten das gleiche E a = 0,38 eV; dies hing damit zusammen, dass beide Arten von Vorrichtungen dieselbe Deckschicht aus TaO auf der Oberseite der Schaltschichten aufwiesen. Die LRS-Degradation ist ein Prozess der Rekombination von Leerstellen und Ionen, was bedeutet, dass die TaO-Schicht diese chemische Reaktion steuert und die meisten Leerstellen in der Nähe der Grenzfläche zwischen TaO und der Schaltschicht gedrängt sind. Diese Stellen bleiben lieber an der Schnittstelle TaO/Switching-Layer; dieses Phänomen könnte vom Standpunkt der thermodynamischen Stabilität unterstützt werden, wie von Zhong et al. [23]. In ihrer Simulation von TiN/Ta/HfO x /TiN-Stapel, die Sauerstoffionen bleiben bevorzugt auf dem Ta/HfO x Grenzfläche, da zwischen Ta und HfO eine geringe Energiedifferenz bestand x [23]. In ihrer Simulation, wie in den vorliegenden Experimenten, fing die TaO-Widerstandsschicht die meisten Sauerstoffionen ein und dominierte diesen Leerstellenrekombinationsprozess. Die LRS-Verschlechterung ist in Abb. 4c schematisiert. Die Sauerstoffionen kehren während des Backvorgangs in den vorherigen thermischen Gleichgewichtszustand zurück, was zu einem Retentionsverlust führt. Unterschiede sind zwischen Ta/HfO x . festzustellen Vorrichtung, wie von Zhong et al. vorgeschlagen. und TaO/HfO x Gerät in dieser Studie, aber in beiden Studien wurde die TaO-Schicht durch mehrere Zyklen von Metall-Ta-Abscheidung und LTPO-Prozessen gebildet [14]. Aufgrund des LTPO-Prozesses wird das metallreiche TaO/HfO x Grenzfläche kann als Sauerstoffionenreservoir betrachtet werden. Beim Rekombinationsprozess von Sauerstoffionen und Leerstellen spielt die Atompackungsdichte eine wesentliche Rolle. Die überlegenen LRS-Retentionseigenschaften, die in der AlO x . erhalten wurden Schaltschicht könnte durch die hohe Atomdichte des AlO x . erklärt werden Schicht. Es ist bekannt, dass die Bindungslänge von Al-O kürzer ist als die von Hf-O [24, 25]. Die kurze Bindung im AlO x verringert die Sauerstoffionenmobilität aufgrund einer hohen Coulomb-Wechselwirkung, was zu einer hohen Sauerstoffleerstellen-Diffusionsbarriere führt. Diese Barriere bewirkt eine längere Retentionszeit in einem TaO/AlO x Gerät als in einem TaO/HfO x ein.
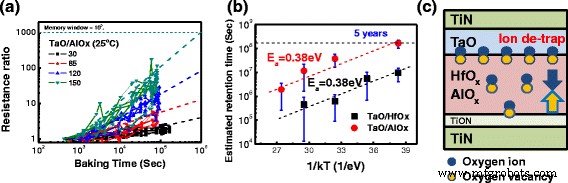
a Widerstandsänderungsverhältnis versus Backzeit für verschiedene Temperaturen in TaO/AlO x Geräte. Der durchschnittliche Anfangswiderstand betrug 179 MOhm bei einer Lesespannung von 2 V, und die Verschlechterungsrate des LRS-Widerstands wurde mit der linearen Anpassungsmethode in log(R Verhältnis )–log(T)-Skala. b Geschätzte Retentionszeit (1000×) gegen 1/kT-Diagramm. Jeder Punkt enthält Daten von 18 Geräten, die bei einer Lesespannung von 2 V aufgenommen wurden. Die extrahierten Aktivierungsenergien betrugen 0,38 eV in beiden TaO/AlO x und TaO/HfO x Geräte. c Schematische Darstellung der Retention verschiedener Sauerstoffdiffusionsbarrieren in HfO x oder AlO x mit einer TaO-Deckschicht
Außerdem unterscheidet sich das Retentionsverlustmodell einer Vorrichtung vom Filamenttyp von dem einer Vorrichtung vom Fehlereinfangtyp. Das Retentionsverhalten für RRAM vom Filamenttyp hängt mit dem Bruch des Filaments zusammen, und die Leerstellendiffusionsrichtung ist lateral [11, 19, 24]. Beim Fehlereinfang-RRAM ist die Fehlerdiffusionsrichtung longitudinal, was parallel zum externen elektrischen Feld ist. Daher kann das Halteverhalten durch die Vorspannungsrichtung und -größe beeinflusst werden. Abbildung 5a, b zeigt die Beibehaltung der Vorspannung durch das Widerstandsverhältnis für die beiden Geräte. Das Widerstandsverhältnis ist definiert als der Widerstand des Belastungsgeräts zum Widerstand des LRS. Ein positiver Bias kann helfen, den LRS aufrechtzuerhalten, aber ein negativer Bias beschleunigt den Abbauprozess. Diese On-Bias-Eigenschaften könnten durch die Wechselwirkung zwischen dem lokalisierten Feld von Paaren von Sauerstoffionen und Leerstellen und dem externen elektrischen Feld erklärt werden. Wenn die Richtung des externen Felds der eingestellten Richtung (positiv) entspricht, verlängert dies die Retentionszeit; wenn das externe Feld in Rücksetzrichtung (negativ) ist, verursacht es eine Verschlechterung. In einem niedrigen elektrischen Feld mit ±100 mV ist die On-Bias-Degradation bei beiden Gerätetypen gleich der No-Bias-Degradation. Diese Abweichung von ±100 mV könnte durch die Bandversätze von TiON-HfO x . abgedeckt werden , TiON-AlO x und TiN-TaO-Übergänge. A TaO/AlO x Gerät unter einer hohen positiven Vorspannung von 500 mV zeigt keine offensichtliche Verschlechterung.
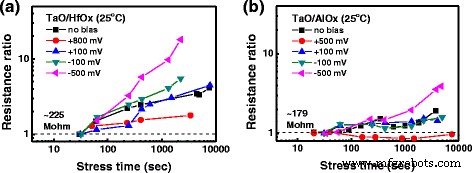
On-Bias-Widerstandsverhältnis versus Stresszeit für a TaO/HfO x und b TaO/AlO x Geräte bei Raumtemperatur
Schlussfolgerungen
Zusammenfassend haben wir zwei Arten von selbstkorrigierten RRAM-Bausteinen anhand ihrer Schalteigenschaften verglichen und ihr Retentionsverhalten analysiert. Das TaO/AlO x Gerät zeigte eine höhere Schaltspannung und eine robustere thermische LRS-Stabilität als das TaO/HfO x Gerät gemacht hat. Der Vorteil einer robusten Retention aus dem AlO x Schaltschicht ist eher auf die hohe Sauerstoffdiffusionsbarriere als auf die Aktivierungsenergie zurückzuführen. Die Aktivierungsenergie des Rückhalteverlusts hängt mit dem Ionen-Entfallsprozess in der TaO-Widerstandsschicht zusammen. Die hohe Atomdichte von AlO x Film kann die LRS-Retention verbessern. Ein schematisches Modell für den Retentionsverlust wurde vorgeschlagen und die Ergebnisse der On-Bias-Retention unterstützten dieses Modell. Dieses Modell könnte für die Entwicklung von selbstkorrigierenden RRAM-Bauelementen mit geringem Strom und langer Speicherdauer für zukünftige Speicheranwendungen mit hoher Dichte von Vorteil sein.
Nanomaterialien
- Eigenschaften und Anwendungen von Titan
- Schaltung mit Schalter
- Führen mit Beharrlichkeit und Beharrlichkeit
- switch…case in C (Switch-Anweisung in C) mit Beispielen
- Intelligentes Nanomaterial und Nanokomposit mit fortschrittlichen agrochemischen Aktivitäten
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Optische und elektrische Eigenschaften von Silizium-Nanodrähten, die durch stromloses Ätzen hergestellt wurden
- Einfache Synthese von farbigen und leitfähigen CuSCN-Kompositen, die mit CuS-Nanopartikeln beschichtet sind
- Erhöhte Biokompatibilität in anodischen TaO x Nanotube-Arrays



