Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
Zusammenfassung
In situ gebildetes SiO2 wurde in HfO2 . eingeführt Gate-Dielektrika auf Ge-Substrat als Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung (PEALD). Die Grenzflächen-, elektrischen und Bandausrichtungseigenschaften des HfO2 /SiO2 Gate-Dielektrikumstapel mit hohem k auf Ge wurden gut untersucht. Es wurde gezeigt, dass eine Si-O-Ge-Zwischenschicht auf der Ge-Oberfläche während des in situ PEALD SiO2 . gebildet wird Abscheidungsprozess. Diese Zwischenschicht zeigt während des Glühens eine fantastische thermische Stabilität ohne offensichtliche Hf-Silikate-Bildung. Darüber hinaus kann es auch das GeO2 . unterdrücken Degradierung. Die elektrischen Messungen zeigen eine kapazitätsäquivalente Dicke von 1,53 nm und eine Leckstromdichte von 2,1 × 10 –3 A/cm 2 bei Gate-Vorspannung von Vfb + 1 V wurde für die getemperte Probe erhalten. Die Leitungs-(Valenz-)Band-Offsets am HfO2 /SiO2 /Ge-Schnittstellen mit und ohne PDA werden zu 2,24 (2,69) bzw. 2,48 (2,45) eV gefunden. Diese Ergebnisse zeigen, dass in situ PEALD SiO2 könnte eine vielversprechende Grenzflächensteuerschicht für die Realisierung hochwertiger Ge-basierter Transistorbauelemente sein. Darüber hinaus kann gezeigt werden, dass PEALD eine viel leistungsfähigere Technologie für die Abscheidung von ultradünnen Grenzflächenkontrollschichten ist als MOCVD.
Hintergrund
Mit der kontinuierlichen Verkleinerung von Metall-Oxid-Halbleiter-Feldeffekttransistoren (MOSFETs) stoßen Si-basierte MOSFETs an ihre physikalischen und technischen Grenzen. Alternative Kanalmaterialien wie Germanium (Ge) [1, 2] und III-V-Materialien [3–5] haben in letzter Zeit großes Interesse für Hochleistungslogikanwendungen geweckt. Unter diesen hat Ge aufgrund seiner intrinsischen höheren Lochträgermobilität das Potenzial, Silizium als Kanalmaterial in MOSFETs zu ersetzen [6]. Die direkte Abscheidung von High-k-Gate-Dielektrika auf Ge-Substraten verursacht jedoch häufig eine hohe Grenzflächenfallendichte (Dit ) und die unerwünschte Bildung von Grenzflächen zwischen Ge- und High-k-Dielektrikaschichten [7]. Um Hochgeschwindigkeits- und Niedrigleistungs-MOSFETs auf Ge-Basis zu erzielen, ist es daher sehr wichtig, ein qualitativ hochwertiges High-k . zu erreichen /Ge-Schnittstelle. Glücklicherweise wurde über viele Methoden berichtet, um die Qualität von High-k/Ge-Grenzflächen zu verbessern [8], wie z. B. die Einführung von SiO2 [9], Si [10], GeO2 [11], Al2 O3 [12, 13], GeOx Ny [14, 15] und Seltenerdoxide [16, 17] als Grenzflächenkontrollschicht zwischen Ge-Substrat und Hoch-k Gate-Dielektrika. Insbesondere das GeO2 /Ge-Struktur hat überlegene Grenzflächeneigenschaften, eine extrem niedrige Grenzflächenzustandsdichte (Dit ) von weniger als 1 × 10 11 cm −2 eV −1 erreicht werden [18]. Allerdings GeO2 zersetzt sich über 425 °C und ist wasserlöslich. Als Ergebnis ein inakzeptables Dit wird immer für den Ge-MOS-Kondensator (MOSCAP) offenbart [6]. Glücklicherweise haben Kita et al. berichteten, dass die Deckschicht auf GeO2 kann das GeO2 . unterdrücken Degradierung; jedoch sollte die Wahl des Materials für die Deckschicht sehr entscheidend sein [19–21]. Zum Beispiel Si oder Y2 O3 arbeitet effizienter als HfO2 um die Ge-O-Desorption zu verzögern. Diese Ergebnisse zeigen die Bedeutung von High-k-Materialien oder der Auswahl der Grenzflächenkontrollschicht, um das GeO2 . zu hemmen Degradierung. Nakashimaet al. berichteten, dass ein sehr dünnes SiO2 /GeO2 Bilayer durch physikalische Gasphasenabscheidung (PVD) ist eine vielversprechende Zwischenschicht für die Ge-Passivierung, ein Dit von 4 × 10 11 cm -2 eV −1 wurde in der Nähe des Midgap erreicht [22, 23]. Liet al. führte das SiO2 . ein Zwischenschicht auf Ge durch metallorganische chemische Gasphasenabscheidung (MOCVD) und SiO2 Zwischenschicht kann die Ausdiffusion von Ge während HfO2 . effektiv unterdrücken Wachstum und anschließender Temperprozess nach der Abscheidung [9]. Daher ist SiO2 sollte eine wunderbare Grenzflächenkontrollschicht für Ge-Substrat sein. Im Vergleich zu PVD und MOCVD kann PEALD jedoch eine viel gleichmäßigere Passivierungsschicht bereitstellen, insbesondere bei ultradünnen Dicken. Daher PEALD-gebildetes SiO2 kann eine vielversprechende Grenzflächensteuerschicht sein, um Hochleistungs-Transistorbauelemente auf Ge-Basis zu erreichen.
Hier haben wir in situ PEALD-gebildetes SiO2 . eingeführt in HfO2 /Ge-Stapel als Grenzflächenschicht. Die Grenzflächen-, elektrischen und Bandausrichtungseigenschaften von ALD HfO2 Filme auf n-Typ-Ge-Substraten wurden sorgfältig untersucht. Das SiO2 wurde zuerst auf den Ge-Substraten als Grenzflächenkontrollschicht durch PEALD abgeschieden. Dann HfO2 Gate-Dielektrikum wurde in situ durch den thermischen ALD-Modus abgeschieden. Glühen nach der Abscheidung (PDA) bei 500 °C für 60 s in N2 wurde für HfO2 . durchgeführt /SiO2 Gate-Dielektrikumstapel mit hohem k auf Ge. Die Röntgenphotoelektronenspektroskopie-Analysen zeigen, dass die Si-O-Ge-Zwischenschicht und GeO2 Schicht wird auf der Ge-Oberfläche während PEALD SiO2 . gebildet Ablage. Diese Si-O-Ge-Zwischenschicht zeigt nicht nur eine fantastische thermische Stabilität, sondern kann auch die thermische Zersetzung von GeO2 . unterdrücken . Daher wurden für HfO2 . gute elektrische Eigenschaften erzielt /Si-O-Ge/GeO2 /Ge-Stapel. Im Vergleich zu MOCVD SiO2 Zwischenschicht, in situ PEALD SiO2 weist stark verbesserte elektrische Eigenschaften auf. Daher ist PEALD im Bereich der MOSFET-Herstellung eine viel leistungsfähigere Technologie als MOCVD, insbesondere für die Abscheidung von ultradünnen Grenzflächenkontrollschichten.
Methoden
Als Substrate wurden N-Typ Sb-dotiertes Ge (100) mit einem spezifischen Widerstand von 0.2–0.3 Ω∙cm verwendet. Die Substrate wurden zunächst durch Beschallung in Aceton, Ethanol, Isopropanol bzw. entionisiertem Wasser für 5 Minuten gereinigt. Dann wird eine verdünnte HBr-Lösung (H2 O/HBr = 3:1) wurde verwendet, um die nativen Oberflächenoxide 5 min lang zu ätzen. Nach der nasschemischen Reinigung wurden die Substrate mit entionisiertem Wasser gespült und in reinem N2 . trocken geblasen . Anschließend wurden die Substrate sofort auf die PEALD (Picosun SUNALE TM R-200) Kammer. Vor dem High-k HfO2 Filmabscheidung, 10 Zyklen SiO2 Film wurde bei 250 °C durch PEALD als Zwischenschicht abgeschieden, wobei ein Zyklus aus 1 s einer Si-Quelleninjektion, 10 s N2 . bestand Spülen, 13,5 s Oxidationsmitteleinspritzung und 4 s N2 Reinigung. Tris-(dimethylamino)-silan (TDMAS) und O2 Plasma wurden als Si-Precursor und Oxidationsmittel für SiO2 . verwendet Ablagerung bzw. TDMAS wurde bei Raumtemperatur aufbewahrt. Reines O2 Gas (99,999 %) wurde als O2 . verwendet Plasmaquelle. Die Plasmaleistung und O2 die Gasflussrate betrug 2500 W bzw. 160 sccm. Die Wachstumsrate von PEALD SiO2 wurde durch Ex-situ-Spektroskopie-Ellipsometrie zu ~0.7 Å/Zyklus bestimmt. Dann ~4 nm dickes HfO2 Film wurde in situ bei 250 °C für 40 Zyklen durch thermische ALD abgeschieden, wobei ein Zyklus aus 0,1 s Hf-Quellendosierung, 4 s N2 . bestand Spülen, 0,1 s H2 O-Dosierung und 4 s N2 Reinigung. Tetrakis-(ethylmethylamino)-hafnium (TEMAH) und H2 O wurden als Hf-Vorläufer und Oxidationsmittel für HfO2 . verwendet Ablagerung bzw. TEMAH wurde bei 150 °C und H2 . verdampft O wurde bei Raumtemperatur gehalten. Reines N2 (99,999 %) wurde als Trägergas und Spülgas verwendet. PDA wurde in N2 . durchgeführt Umgebungstemperatur bei 500 °C für 60 s unter atmosphärischem Druck mit schnellem thermischen Glühen.
Die Grenzflächenstrukturen und die chemische Bindung der Filme wurden durch ex-situ-Röntgenphotoelektronenspektroskopie (XPS, Thermo Fisher K-Alpha) mit einer Standard-Al Kα (1486,7 eV)-Röntgenquelle untersucht. XPS-Spektren wurden bei einem Startwinkel von 90° aufgenommen. Die Bindungsenergieskala wurde mit dem Ge 3d5/2 . kalibriert Spitze bei 29,4 eV. Darüber hinaus wurden XPS-Spektren mit Gauß-Lorentz-Funktionen (G-L) nach intelligenter Hintergrundsubtraktion ausgestattet. Pt-Oberseitenelektroden mit einer Fläche von 1,55 × 10 −4 cm 2 wurden auf der Oberfläche von HfO2 . abgelagert Filme unter Verwendung einer Lochmaske durch Sputterverfahren für elektrische Messungen. Die Kapazität-Spannung-(C-V)- und Leckstromdichte-Spannung-(J-V)-Eigenschaften wurden mit einem Keithley 4200 Halbleiteranalysatorsystem mit einer Sondenplattform (Cascade Summit 12000B-M) gemessen.
Ergebnisse und Diskussion
Für das dünne PEALD SiO2 (~0,7 nm) auf Ge zeigt Si 2p einen Peak bei 102,4 eV entsprechend der Si-O-Bindung (Abb. 1a), der kleiner ist als die Bindungsenergie des idealen SiO2 [24]. Sowohl Siliziumsuboxid (SiOx ) Abscheidung und Si-O-Ge-Bildung auf der Ge-Oberfläche während des PEALD-Prozesses kann die Verschiebung von Si 2p zu einer niedrigeren Energie bewirken. Daher wurde auch ein Si 2p-Spektrum von dickem PEALD (~7 nm) auf Ge durchgeführt. Es zeigt sich, dass es einen Hauptpeak bei 103,6 eV aufweist, der dem idealen SiO2 . entspricht Kleben, wie in Abb. 1b gezeigt. Das hier von PEALD abgeschiedene Siliziumoxid ist also ideal SiO2 . Neben dem starken Si-O-Si-Peak gibt es jedoch einen schwachen Peak bei ~102,4 eV, der der Si-O-Ge-Bindung auf der Ge-Oberfläche entsprechen sollte. Daher kann geschlossen werden, dass Si-O-Ge auf der Ge-Oberfläche im anfänglichen PEALD SiO2 . gebildet wird Wachstum. Nach in-situ 4 nm HfO2 Abscheidung nimmt die Si 2p-Peakintensität ohne offensichtliche chemische Verschiebung (102,3 eV) ab, wie in Abb. 1a gezeigt. Darüber hinaus ist das Si 2p Peak zeigt auch keine offensichtliche chemische Verschiebung (102,2 eV) nach dem PDA von 500 °C in N2 , was auf die gute thermische Stabilität des HfO2 . hindeutet /SiO2 Schnittstelle während HfO2 Abscheidung und PDA-Verfahren. In Hf 4f-Spektrum von HfO2 . im abgeschiedenen Zustand /SiO2 Gatestapel (Abb. 1c), das Dublett bei 16,5 und 18,2 eV kann Hf 4f7/2 . zugeordnet werden und Hf 4f5/2 Peaks von HfO2 mit einer Spin-Bahn-Aufspaltungsenergie von 1,7 eV, im Einklang mit dem Literaturwert von HfO2 [25]. Nach einer PDA von 500 °C zeigt das Hf 4f-Spektrum keine offensichtliche Änderung mit einer Verschiebung von nur 0,1 eV zu einer höheren Energie. Dies impliziert, dass während des PDA-Prozesses keine offensichtlichen Hf-Silikate gebildet werden. In Abb. 1d zeigt das Ge 3d-Spektrum der abgeschiedenen Probe die Dublett-Peaks bei 29,4 und 30,0 eV, die den Ge 3d5/2- und Ge 3d3/2-Peaks des Ge-Substrats mit der Spinorbit-Aufspaltungsenergie von . zugeordnet werden können 0,6 eV. Außer dem Signal des Ge-Substrats gibt es einen riesigen Peak bei 32,7 eV für die Ge-O-Bindung. Der Ge-O-Peak sollte aus der Bildung von Ge-O-Si und GeO2 . resultieren . Das GeO2 Schicht wurde durch Oberflächenoxidation mit Sauerstoffplasma während PEALD SiO2 . gebildet Abscheidungsprozess. Daher ist die wirklich hergestellte Struktur hier HfO2 /Si-O-Ge/GeO2 /Ge-Stapel. Darüber hinaus zeigt das Ge 3d-Spektrum keine offensichtliche Änderung nach einer PDA-Behandlung bei 500 °C, was auf die thermische Stabilität von HfO2 . hinweist /Si-O-Ge/GeO2 /Ge-Stapel ohne GeO2 Degradierung. Es wurde von Kita et al. dass einige Deckschichten auf GeO2 könnte das GeO2 . unterdrücken Zersetzung, wie Si oder La2 O3 [19]. Daher kann die durch PEALD induzierte Si-O-Ge-Zwischenschicht hier auch das GeO2 . unterdrücken Zersetzung. Basierend auf der obigen XPS-Analyse kann geschlossen werden, dass eine ultradünne Si-O-Ge-Zwischenschicht auf der Ge-Oberfläche gebildet wird. Darüber hinaus zeigt diese Zwischenschicht eine fantastische thermische Stabilität ohne Bildung von Hf-Silikaten, sie kann auch das GeO2 . hemmen Abbau.
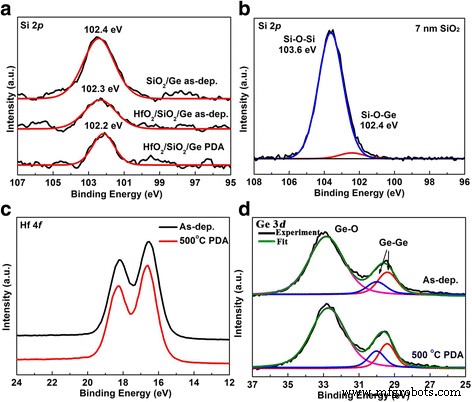
XPS-Spektren von SiO2 /Ge und HfO2 /SiO2 /Ge-Strukturen. a Si 2p-Spektren von SiO2 , wie abgeschieden und geglüht HfO2 /SiO2 auf Ge. b Si 2p-Spektren von dickem SiO2 (7 nm) auf Ge. c, d Hf 4f- und Ge 3d-Spektren von abgeschiedenem und geglühtem HfO2 /SiO2 /Ge-Strukturen
Abbildung 2a zeigt die hochfrequenten (1 MHz) C-V-Kurven von HfO2 /SiO2 Gatestapel auf Ge vor und nach PDA. Es kann festgestellt werden, dass die Flachbandspannung (V fb ) Werte von HfO2 /SiO2 /Ge vor und nach PDA sind 0,42 bzw. 0,27 V. Das berechnete Ideal V fb Wert beträgt 0,55 V. Das leicht negative V fb Verschiebung zeigt positive feste Ladungen an, die durch die Sauerstoffleerstellen in den Dielektrika induziert werden können [26, 27]. Während des Glühprozesses in inerter Atmosphäre können mehr Sauerstoffleerstellen induziert werden, was zu einem leicht negativen V . führt fb Schicht. In vielen veröffentlichten Literaturstellen wurde gezeigt, dass das GeO2 Abbau während des Temperns verursacht das positive V fb Schicht. Es wird angenommen, dass der Desorptionsprozess von Ge-O zusätzliche negative Ladungen erzeugt [28, 29]. Daraus kann auch geschlossen werden, dass GeO2 Zersetzung wird durch Ge-O-Si-Zwischenschicht von V . unterdrückt fb Schicht. Die Akkumulationskapazität steigt offensichtlich von ursprünglich 1,92 auf 2,25 μF/cm 2 nach PDA. Die entsprechenden kapazitätsäquivalenten Dickenwerte (CET) der MOS-Kondensatoren können aus den Akkumulationskapazitäten der C-V-Kurven mit ε0 . berechnet werden εr Klimaanlageac [30]. Daher wird nach PDA eine kleinere CET von 1,53 nm im Vergleich zu einer Probe im abgeschiedenen Zustand von 1,80 nm erhalten. Dies ist darauf zurückzuführen, dass nach dem PDA-Prozess eine dichtere und dünnere High-k-Schicht gewonnen werden kann. Abbildung 2b zeigt die Ableitstromeigenschaften von HfO2 /SiO2 Filme auf Ge vor und nach PDA. Bei der Vorspannung von V fb + 1 V, die Leckstromdichte beträgt 2,1 × 10 −3 A/cm 2 und 2,2 × 10 −4 A/cm 2 für die Probe vor bzw. nach PDA. Die erhöhte Leckstromdichte nach PDA kann auch auf die Abnahme der Dicke der Gatedielektrika zurückgeführt werden.
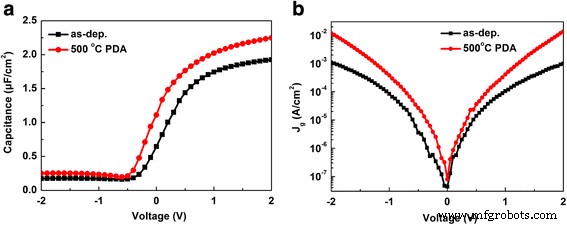
Elektrische Eigenschaften von HfO2 /SiO2 Gatestapel auf Ge-Substraten vor und nach 500 °C PDA. a Hochfrequente (1 M Hz) C-V-Kurven. b J-V-Kurven
Um die Grenzflächenqualität von HfO2 . zu untersuchen /SiO2 /Ge quantitativ die Grenzflächenzustandsdichte (D es ) wurde nach der Leitwertmethode [31] bestimmt. Abbildung 3 zeigt die Verteilung von D es unten Ec in der Bandlücke, die durch die Leitfähigkeitsmethode bei Raumtemperatur für Pt/HfO2 . extrahiert wurde /SiO2 /Ge vor und nach 500 °C PDA. Das D es kann grob berechnet werden aus D es = 2.5 × (G p /w )max /A q, wobei (G p /w )max ist der Spitzenwert der Leitwert-Spannungs-Kennlinie, f (=w /2π) ist die Frequenz, A die Elektrodenfläche ist und q ist die Elementarladung. Daher D es Werte von Pt/HfO2 /SiO2 /Ge-Strukturen ohne und mit PDA werden mit 4,05 × 10 12 . bestimmt eV −1 cm -2 und 5,37 × 10 12 eV −1 cm −2 bei E-Ev = 0,38 eV. Das untere D es Werte von 2,03 × 10 12 cm −2 eV −1 und 2,67 × 10 12 cm −2 eV -1 nahe dem unteren Ende des Leitungsbandes werden für die Proben ohne bzw. mit PDA beobachtet.
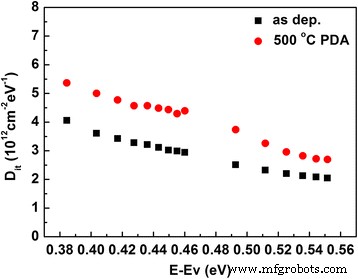
Verteilung von Dit unten Ec in der Bandlücke bei Raumtemperatur für Pt/HfO2 /SiO2 /Ge vor und nach 500 °C PDA
Abbildung 4 veranschaulicht die Leckstromdichte (J g )-CET-Beziehung eines Ge-basierten MOS-Kondensators mit unterschiedlicher Grenzflächenkontrollschicht [32, 33]. Im Vergleich zu dem S-passivierten Ge ohne Zwischenschicht, über das in unserer früheren Arbeit [34] berichtet wurde, ist das HfO2 /SiO2 /Ge zeigt in dieser Arbeit stark verbesserte Eigenschaften bei kleinerer CET (1,53 vs. 2,18 nm), Leckstromdichte (2,1 × 10 −3 gegenüber 3,1 A/cm 2 ) und D es (4,37 × 10 12 gegenüber 8,61 × 10 12 eV −1 cm −2 ). Dies impliziert, dass in situ PEALD-gebildetes SiO2 ist eine wunderbare Passivierungsschicht für Ge. Im Vergleich zu dem ex situ gebildeten SiO2 Zwischenschicht durch MOCVD [9], die Probe mit in situ PEALD gebildetem SiO2 Zwischenschicht in dieser Arbeit zeigt eine bessere elektrische Leistung sowohl bei kleinerer CET (1,53 vs. 1,75 nm) als auch bei der Leckstromdichte (2,1 vs. 3,9 mA/cm 2 .) ). Dies ist darauf zurückzuführen, dass SiO2 von PEALD abgeschieden sind gleichmäßiger als MOCVD, insbesondere bei ultradünnen Dicken.
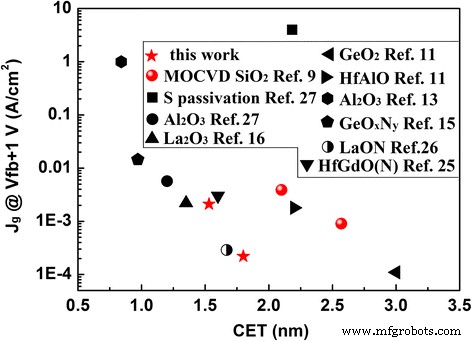
Leckstromdichte (Jg)-CET-Beziehung für Ge-basierte MOS-Kondensatoren mit unterschiedlicher Grenzflächensteuerschicht
Die Bandausrichtung bei HfO2 /SiO2 Die /Ge-Grenzfläche wurde auch durch Messung des Valenzband-Offsets ∆E v . bestimmt (VBO) mit XPS. Die VBO-Werte können unter der Annahme erhalten werden, dass die Energiedifferenz zwischen dem Kernniveau und der Valenzbandkante (VB) des Substrats mit/ohne Abscheidung von Dielektrikafilmen konstant bleibt [35]. Hier wurde das Ge-Substrat als Referenz gewählt, um die VBO zwischen Gate-Dielektrika-Stapel und Ge-Substrat zu bestimmen. Abbildung 5a zeigt die VB-Spektren des sauberen Ge-Substrats, wie abgeschieden und geglüht HfO2 /SiO2 /Ge-Stapel, die jeweils durch die lineare Extrapolationsmethode bestimmt wurden. Die VB-Kante des sauberen Ge-Substrats wurde mit 0,10 eV bestimmt. Und die VB-Kanten des abgeschiedenen und geglühten HfO2 /SiO2 Proben werden mit 2,55 bzw. 2,79 eV ermittelt. Es ist zu erkennen, dass es in den VB-Spektren für HfO2 . einen kleinen Schwanz gibt /SiO2 /Ge-Stapel, was dem Ge-Substratsignal entspricht [36]. Die Vorderkante dieses schwachen Schwanzes wird mit 0,10 eV gemessen und entspricht der VB-Kante des Ge-Substrats. Daher sind die VBOs an der Schnittstelle von HfO2 /SiO2 /Ge mit und ohne PDA wird auf 2,69 bzw. 2,45 eV geschätzt. Der Leitungsband-Offset ∆E c (CBO) kann durch Subtrahieren des VBO und der Bandlücke des Substrats von der Bandlücke von HfO2 . erhalten werden :
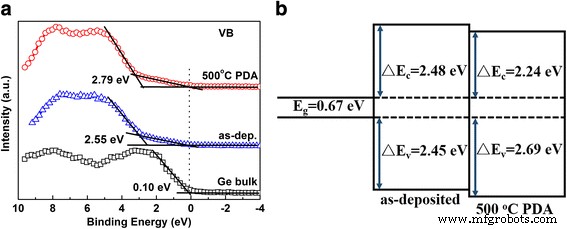
Bandausrichtung von abgeschiedenem und geglühtem HfO2 /SiO2 Film über Ge. a Valenzbandspektren des Ge-Substrats, wie abgeschieden und getempert HfO2 /SiO2 Filme. b Schema der Bandausrichtung von abgeschiedenem und geglühtem HfO2 /SiO2 Film auf Ge
$$ \varDelta {E}_c={E}_g\left({\mathrm{HfO}}_2\right) - {E}_g\left(\mathrm{Ge}\right) - \varDelta {E}_v , $$wo E g (HfO2 ) und E g (Ge) sind die Bandlücke von HfO2 bzw. Ge. Die Bandlücken von Ge und HfO2 0,67 bzw. 5,6 eV betragen. Daher sind die CBO-Werte an der Grenzfläche von HfO2 /SiO2 /Ge mit und ohne PDA wird auf 2,24 bzw. 2,48 eV geschätzt. Die CBO-Werte stimmen mit den zuvor berichteten Daten von 1,8–2,6 eV überein [37]. Abbildung 5b veranschaulicht die entsprechende Bandausrichtung von abgeschiedenem und getempertem HfO2 /SiO2 /Ge-Strukturen. Offensichtlich ist das HfO2 /SiO2 Gate-Dielektrikumstapel mit hohem k auf Ge weisen große VBO- und CBO-Werte mit enormen Barrierehöhen auf, um Leckströme zu verhindern.
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass SiO2 Zwischenschicht wurde in HfO2 . eingeführt Gate-Dielektrika auf n-Ge-Substraten erfolgreich durch in situ PEALD. Wir haben die Grenzfläche, die elektrischen Eigenschaften und die Bandausrichtung von HfO2 . untersucht /SiO2 /Ge MOS. Es wurde gezeigt, dass die Ge-O-Si-Zwischenschicht und GeO2 Schicht wird auf der Ge-Oberfläche während der in situ SiO2 . gebildet Ablage. Diese Ge-O-Si-Zwischenschicht zeigt eine fantastische thermische Stabilität während der PDA ohne Bildung von Hf-Silikaten. Darüber hinaus kann die Ge-O-Si-Zwischenschicht auch das GeO2 . hemmen Abbau während des Glühprozesses. Das HfO2 /SiO2 /Ge-Probe nach PDA zeigt einen CET-Wert von 1,53 nm mit einer geringen Leckstromdichte von 2,1 × 10 −3 A/cm 2 bei Vfb + 1 V. Die VBO-Werte bei HfO2 /SiO2 /Ge mit und ohne PDA werden zu 2,69 und 2,45 eV bestimmt, und die CBO-Werte betragen 2,24 bzw. 2,48 eV. Im Vergleich zum ex situ gebildeten SiO2 Zwischenschicht durch MOCVD, die Probe mit in situ PEALD-gebildetem SiO2 Zwischenschicht in dieser Arbeit zeigt eine verbesserte elektrische Leistung, die der Tatsache zugeschrieben wird, dass SiO2 von PEALD hinterlegt sind einheitlicher als MOCVD. Daher ist PEALD eine viel leistungsfähigere Technologie für die Abscheidung von ultradünnen Grenzflächenkontrollschichten als MOCVD.
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Retentionsmodell von TaO/HfO x und TaO/AlO x RRAM mit selbstrichtenden Schaltereigenschaften
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Optische und elektrische Eigenschaften von Silizium-Nanodrähten, die durch stromloses Ätzen hergestellt wurden
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Elektrische Eigenschaften von Verbundmaterialien mit durch ein elektrisches Feld unterstützter Ausrichtung von Nanokohlenstoff-Füllstoffen
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Dickenabhängigkeit von Grenzflächen- und elektrischen Eigenschaften in Atomlagen-abgeschiedenem AlN auf c-Ebenen-GaN



