Durchbrechen der Multi-Mesa-Kanal-Breite begrenzt von normalerweise Off GaN-HEMTs durch Modulation der Via-Hole-Länge
Zusammenfassung
Wir präsentieren neue normalerweise ausgeschaltete GaN-Transistoren mit hoher Elektronenmobilität (HEMTs), die die typischen Beschränkungen der Multi-Mesa-Kanal (MMC)-Breite durch Modulation der Durchgangslochlänge überwinden, um den Ladungsneutralitätsschirmeffekt zu regulieren. Wir haben GaN-HEMTs im Anreicherungsmodus (E-Modus) mit Breiten von bis zu 300 nm basierend auf einem verbesserten Oberflächen-Pinning-Effekt hergestellt. E-Mode-GaN-HEMTs mit MMC-Strukturen und -Breiten sowie Durchgangslochlängen von 100 nm/2 μm bzw. 300 nm/6 μm zeigten positive Schwellenspannungen (V te ) von 0,79 bzw. 0,46 V. Die Einschaltwiderstände der MMC- und Durchkontaktierungslochlängenstrukturen waren niedriger als die von typischen Tri-Gate-Nanoband-GaN-HEMTs. Darüber hinaus erreichten die Geräte nicht nur den E-Modus, sondern verbesserten auch die Leistungsleistung der GaN-HEMTs und milderten effektiv den thermischen Effekt des Geräts. Wir kontrollierten den Pinning-Effekt der Seitenwandoberfläche über die Länge des Durchgangslochs, um die E-Mode-GaN-HEMTs zu erhalten. Unsere Ergebnisse deuten darauf hin, dass die Durchgangslochlänge normalerweise abseits von GaN-HEMTs großes Potenzial für den Einsatz in der Leistungselektronik der nächsten Generation hat.
Hintergrund
III–V-Nitride mit breiter Bandlücke sind aufgrund ihrer hervorragenden Materialeigenschaften, einschließlich großer Bandlücken, hoher kritischer elektrischer Felder, hoher Sättigungselektronengeschwindigkeiten und hoher Leitfähigkeiten, vielversprechende Halbleitermaterialien für den Frequenz- und Spannungsbetrieb [1, 2]. Dementsprechend werden sie häufig in verschiedenen Anwendungen eingesetzt, einschließlich Leuchtdioden (LED) und Transistoren [3]. Darüber hinaus bilden Aluminium-Gallium-Nitrid/Gallium-Nitrid (AlGaN/GaN)-Heterostrukturen zweidimensionale Elektronengase (2DEGs), die sich für die Entwicklung von Hochleistungsgeräten eignen und die spontane und piezoelektrische Polarisation von III-Nitrid-Verbindungen nutzen [4,5 ,6]. Die Menge eines 2DEG wird durch den Anteil der polarisationsinduzierten Dotierung beeinflusst, was sich direkt auf die Geräteeigenschaften auswirkt [7,8,9]. Obwohl sie viele attraktive Eigenschaften aufweisen, haben AlGaN/GaN-Transistoren mit hoher Elektronenmobilität (HEMTs) keinen universellen Nutzen gefunden, da ihre elektronischen Eigenschaften komplexe Schaltungskonfigurationen für digitale, Leistungs-, HF- und Mikrowellenschaltungsanwendungen erfordern können. Dementsprechend wäre ein normalerweise ausgeschalteter Betrieb für alle zukünftigen III-V-Halbleiterbauelemente unerlässlich [10, 11]. Obwohl einige spezielle Herstellungstechniken getestet wurden (z. B. Verwendung von vertieften Gates [12,13,14], Einfügen von Deckschichten vom p-Typ unter dem Gate [15, 16], Tunnelübergangsstrukturen [17], Fluoridionenimplantation in die Barriere unter dem Gate [18] und der Einschluss dünner AlGaN-Barriereschichten mit einem speziellen Metallgate und einer Rapid Thermal Annealing (RTA)-Behandlung [19]), können sie die Geräteleistung verschlechtern und Stabilitätsprobleme durch prozessbedingte Materialschäden verursachen und erhöhte thermische und elektrische Feldeffekte.
Alternativ fand ein Team der Universität Hokkaido heraus, dass mit Fin-Nanokanälen hergestellte AlGaN/GaN-HEMTs eine Verschiebung der Schwellenspannung (V te ) in positiver Richtung [20, 21]. Eine Gruppe der Universität Soochow berichtete, dass der Wert von V te erfuhr eine systematische positive Verschiebung, wenn die Nanokanalbreite weniger als 90 nm betrug [22]. Forscher der Kyungpook National University betrachteten die partielle Dehnungsrelaxation der Seiten der Kanäle, um das Verhalten zu erklären [23]. Ein Team des Massachusetts Institute of Technology simulierte die Schwellenspannung nach Oberflächenpassivierung von GaN-basierten HEMTs und stellte fest, dass positive Werte auftraten, wenn die Breite des Kanals weniger als 100 nm betrug [24], das Ergebnis von Seitenwandeffekten und erhöhter Zugspannung das verringerte die Elektronenkonzentration im Kanal. Rippenförmige Strukturen verschieben nicht nur die Schwellenspannung, sondern verbessern auch die Steuerbarkeit des Gates aufgrund der 3D-Struktur, die eine Leistung im Ein-Zustand induziert, während die Eigenschaften im ausgeschalteten Zustand verbessert werden. Der normalisierte maximale Drainstrom (I D /mm) in einem AlGaN/GaN-HEMT mit flossenförmiger Struktur ist höher als in einer entsprechenden planaren Struktur [25]. Obwohl diese Verfahren zur Herstellung von E-Mode-HEMTs verwendet wurden, bleibt es eine große Herausforderung, hochleistungsfähige GaN-Leistungstransistoren mit normalerweise ausgeschaltetem Zustand zu entwickeln. Vor allem die Kombination aus einem niedrigen Einschaltwiderstand (R an ) und eine geringe Gesamtleistung des Geräts ist zu erreichen, wenn die Breite des Kanals auf weniger als 100 nm begrenzt ist. Obwohl der Wert von R an des Kanals durch Verkürzen der Länge des selbstsperrenden Gates verringert werden kann, stellt die Steuerung des Drain-Leckstroms im Sperrzustand eine weitere Herausforderung dar, da die Gate-Breite die Steilheit und Gate-Leckage durch Polarisations-Coulomb-Feldstreuung und Gate-Leckpfade beeinflusst [26, 27 ]. Abgelagerte Filme können als Gate-Dielektrika verwendet werden, um diese Probleme zu verbessern [28].
In diesem Brief beschreiben wir einen Durchbruch bei der Breitenbegrenzung von Tri-Gate-Kanälen und schlagen ein Verfahren zum Modulieren der Durchgangslochlänge der Kanäle vor. Unser Gerät erreichte den E-Modus mit einer MMC-Strukturbreite von 300 nm und einer Durchgangslochlänge von 6 μm und wies eine Schwellenspannung von 0,46 V auf. Dieser Ansatz verringerte nicht nur den Einschaltwiderstand des Geräts (R an ), könnte aber auch den Joule-Heizeffekt abschwächen. Durch die Kombination eines 3D-Tri-Gates mit verschiedenen Kanalbreiten und Durchgangslochlängen erreichten wir normal ausgeschaltete GaN-HEMTs mit positiven Werten von V te von 0,79 und 0,46 V, wenn die Kanalbreiten/Durchgangslochlängen 100 nm/2 μm bzw. 300 nm/6 μm betrugen.
Methoden
Der AlGaN/GaN-Epi-Wafer wurde auf einem (0001) Saphir-Substrat unter Verwendung eines Nippon Sanso SR-2000 metall-organischen chemischen Gasphasenabscheidungssystems (MOCVD) aufgewachsen. Das Wachstum der epitaktischen Struktur begann mit einer bei 600 °C abgeschiedenen GaN-Keimbildungsschicht. Eine 2 μm dicke unbeabsichtigt dotierte GaN-Pufferschicht, eine 21,8 nm dicke unbeabsichtigt dotierte AlGaN-Barriereschicht mit einer nominalen Aluminiumzusammensetzung von 23% und eine 2 nm dicke GaN-Deckschicht wurden dann bei 1180 °C abgeschieden. Die Gerätebearbeitung wurde unter Verwendung eines reaktiven Ionenätzsystems (RIE) mit induktiv gekoppeltem Plasma (ICP) mit einem BCl3 . begonnen /Cl2 Gasmischung, um eine 130 nm tiefe Mesa zu isolieren und eine periodische Grabenstruktur zu ätzen. Anschließend wurden zwei Prozesse angewendet, um die kristallinen Facetten des Vertiefungsbereichs und der Mesa-Seitenwände wiederherzustellen und das Ausmaß von Oberflächendefekten und Schäden durch Ionenbeschuss zu verringern. Die erste beinhaltete die Verwendung von geschmolzenem KOH für kristallographisches nasschemisches Ätzen, um durch Trockenätzen induzierte Oberflächenschäden zu entfernen und gleichzeitig glatte vertikale Seitenwände zu erzeugen; die zweite bestand darin, Piranha-Lösung (eine Mischung aus H2 SO4 und H2 O2 ) zur Oberflächenreinigung und Entfernung organischer Rückstände. Konventionelle Photolithographie mit einer Quecksilberlampe wurde angewendet, um Drain, Source, Gate und Kontaktpads für DC-Messungen zu definieren. Ohmsche Kontakte zum AlGaN/GaN-Heteroübergang, bestehend aus Titan/Aluminium/Nickel/Gold (Ti/Al/Ni/Au, 30/120/20/80 nm), wurden durch Elektronenstrahlverdampfung auf den Drain/Source-Bereichen abgeschieden und Glühen bei 850 °C für 30 s unter Vakuum. Um den Transistorkanal zu vervollständigen, wurde eine Gate-Elektrode durch Elektronenstrahlverdampfung von Ni/Au (20/80 nm) hergestellt. Abbildung 1 bietet schematische Darstellungen des Querschnitts der HEMT-Struktur, eine Draufsicht des Geräts und ein 3D-Strukturdiagramm des Geräts. Die Gate-Länge (L g ), MMC-Strukturbreite (W MMC ), MMC-Struktur Via-Hole-Länge (L MMC ) und MMC-Strukturhöhe (H MMC ) betrugen 2 μm, 100–500 nm, 1–6 μm bzw. 130 nm. Flossen wurden parallel geschaltet. Um den Oberflächen-Pinning-Effekt zu verstärken, wurde die GaN-HEMT-Durchgangslochlängenstruktur keiner Passivierung unterzogen. Abbildung 2a zeigt ein Rasterelektronenmikroskopie(REM)-Bild in Draufsicht der metallischen Oberfläche im Source- und Drainbereich. Das optische Mikroskopie-(OM)-Bild in Abb. 2b zeigt vollständige Gates und Kanäle; Bei der Berechnung des tatsächlichen Stroms war es hilfreich zu beobachten, wie viele Kanäle im Gerät vorhanden sind. Die Oberfläche erschien im Bild uneben, weil nach dem Tempern die Atome im Kristallgitter wanderten und die Anzahl der Versetzungen abnahm, was den Widerstand effektiv verringerte. Das REM-Bild in Abb. 2c bestätigte die Abmessungen des Kanals.
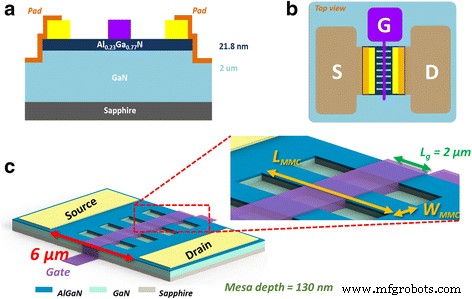
Schematische Darstellungen von a den Querschnitt der HEMT-Struktur, gesehen aus einer Richtung parallel zum Transistorkanal; b die Draufsicht auf die HEMT-Struktur; und c die 3D-Struktur des HEMT
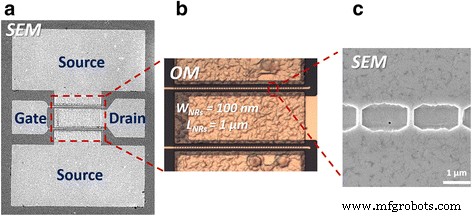
a REM-Aufnahme von oben des Geräts; b OM-Draufsicht des Geräts, das eine Kanalbreite und -länge von 100 nm bzw. 1 μm zeigt; und c REM-Bild von oben des Kanals
Ergebnisse und Diskussion
Bis heute basieren die meisten technologischen Entwicklungen bei GaN-Hochspannungstransistoren auf AlGaN/GaN-HEMTs, die aufgrund des polarisationsinduzierten 2-D-Elektronengases an der AlGaN-GaN-Grenzfläche intrinsisch Verarmungsmodus-(D-Modus)-Bauelemente sind [29]. Nichtsdestotrotz werden normalerweise ausgeschaltete GaN-Transistoren erforderlich sein, wenn die Leistungselektronikindustrie die GaN-Technologien in großem Umfang einführen möchte.
Die Zahl der freien Bindungen auf einer (Al)GaN-Oberfläche beträgt ungefähr 10 15 cm −2 ; diese baumelnden Bindungen induzieren eine oberflächenverarmte Bandbiegung als Ergebnis eines Oberflächen-Pinning-Effekts. Abbildung 3a zeigt die oberflächenverarmten Bereiche des seitlichen Kanals von den Seitenwand-Gates in der Tri-Gate-Struktur. Forscher der Kyungpook National University berichteten über ein ähnliches Phänomen [21]. Abbildung 3b zeigt das Ich DS –V G Übertragungseigenschaften von Geräten mit einem festen Wert von L MMC von 2 μm und Werten von W MMC von 100, 300 und 500 nm. Wenn die Drain-Source-Spannung 8 V betrug, waren die Werte von V te dieser Geräte waren +0,79, -1,32 bzw. -2,18 V. Somit trat eine positive Verschiebung der Schwellenspannung auf, wenn die Kanäle schmaler wurden. Dieses Phänomen kann auf die seitliche Kanalverarmung und das Oberflächen-Pinning der 2 µm Durchgangslochlänge von der Seitenwand in der MMC-Durchgangslochlängenstruktur durch die Auswirkungen der seitlichen Kanalverarmung und der Durchgangslochlängen-Oberflächenbiegung zurückzuführen sein .

a Schematische Darstellung von AlGaN/GaN-HEMTs mit breiten und schmalen Kanälen. b Ich DS –V G Übertragungseigenschaften gemessen für ein Gerät mit einem Wert von L MMC von 2 μm und verschiedene Werte von W MMC
Abbildung 4 zeigt den IDS –VG Übertragungseigenschaften von Geräten mit einem festen Wert von W MMC von 300 nm und Werte von L MMC von 1, 2 und 6 μm. Wenn die Drain-Source-Spannung 8 V betrug, waren die Werte von V te waren –2,12, –1,07 bzw. +0,46 V. Das Gerät erreichte einen Normal-Off-Betrieb, wenn die MMC-Länge und -Breite 6 μm bzw. 300 nm betrugen. Das Modulieren der Durchgangslochlänge und der Kanalbreite kann ein Gerät bereitstellen, das einen normalerweise ausgeschalteten Betrieb anzeigt. Tabelle 1 listet die Schwellenspannungen auf, die für verschiedene Durchgangslochlängen und Multimesa-Kanalbreiten gemessen wurden. Wenn die Kanalbreite auf 500 nm festgelegt und die Durchgangslochlänge von 0,8 auf 6 μm erhöht wurde, beträgt der Wert von V te von –2,62 auf –1,62 V erhöht, der Sättigungs-Drain-Strom von 747 auf 98 mA/mm und die Steilheit von 270 auf 40 mS/mm verringert. Wenn die Kanalbreite auf 300 nm festgelegt und die Durchgangslochlänge von 0,8 auf 6 μm erhöht wurde, beträgt der Wert von V te von -2,15 auf +0,46 V erhöht, der Sättigungs-Drain-Strom von 685 auf 6,8 mA/mm und die Steilheit von 290 auf 7,4 mS/mm verringert. Wenn die Kanalbreite auf 100 nm festgelegt und die Durchgangslochlänge von 0,8 auf 2 μm erhöht wurde, beträgt der Wert von V te von -0,41 auf +0,79 V erhöht, der Sättigungs-Drain-Strom von 547 auf 53 mA/mm verringert und die Steilheit von 400 auf 67 mS/mm verringert. Die Stromaufnahmekapazität des HEMT wird stark von den Trägerkonzentrationen beeinflusst [20, 21]. Dementsprechend wurden die Sättigungs-Drain-Ströme und die Transkonduktanzen der Bauelemente stark durch die Gesamtoberflächenzustände der Seitenwände und den oberflächenverarmten Effekt des Tri-Gate-Kanals beim Variieren der Breiten und Durchkontaktierungslängen der GaN-HEMTs beeinflusst. Im Vergleich zu zuvor gemeldeten Geräten [23] hat unser Gerät einen neuen Meilenstein für niederohmige, normalerweise ausgeschaltete GaN-HEMTs erreicht.

Ich DS –V G Übertragungseigenschaften von Geräten mit einem festen Wert von W MMC von 300 nm und verschiedene Werte von L MMC
Schlussfolgerungen
Wir haben E-Mode-GaN-HEMTs mit einer Multi-Mesa-Channel (MMC)-Struktur hergestellt; sie zeigten eine positive Schwellenspannung von 0,46 V, wenn die Kanalbreite und die Durchgangslochlänge 300 nm bzw. 6 μm betrugen. Wir folgern, dass die Auswirkungen sowohl der seitlichen Kanalverarmung als auch der Oberflächenbiegung über die Länge des Durchgangslochs resultieren. Wenn sie ein Tri-Gate mit einer MMC-Durchgangslochlängenstruktur enthielten, zeigten die neuen normalerweise ausgeschalteten GaN-HEMTs einen sehr geringen Ein-Widerstand, selbst wenn die MMC-Strukturbreite auf 300 nm erhöht wurde (früher auf weniger als 100 nm begrenzt). Darüber hinaus verbessert die Modulation der MMC-Struktur mit Durchgangslochlänge, die normalerweise von GaN-HEMTs bereitgestellt wird, eine hervorragende Leistungsleistung, als Ergebnis der Erhöhung der MMC-Struktur-Bauelementbreite.
Nanomaterialien
- Anschweiß- vs. Durchziehgriffe:Was ist der Unterschied?
- Die Anatomie einer Schraube aufschlüsseln
- Pulsweitenmodulation
- Open Source und das IoT:Innovation durch Zusammenarbeit
- Auf einem Weg durch das IoT-Sicherheitslabyrinth
- Durchbrechen des Kreislaufs der technologischen Verschuldung in der Lieferkette
- Transformation des Beschaffungsprozesses durch Robotik
- ProtoPumpkins im Laufe der Jahre
- Kältelufttrockner - Die Grundlagen aufschlüsseln
- Aufschlüsselung der Grundlagen der Herstellung von Kanälen



