Fast Effizienz-Droop-Free AlGaN-basierte UV-Licht emittierende Dioden mit einer speziell entwickelten Übergitter-Elektronenblockierschicht vom p-Typ für eine hohe Mg-Dotierungseffizienz
Zusammenfassung
Diese Arbeit berichtet von einer nahezu wirkungsgradabfallfreien AlGaN-basierten tief-ultravioletten Leuchtdiode (DUV-LED), die in der Spitzenwellenlänge von 270 nm emittiert. Die DUV-LED verwendet eine speziell entwickelte Supergitter-Elektronenblockierschicht (p-EBL). Das Übergitter-p-EBL ermöglicht eine hohe Lochkonzentration in der p-EBL, was die Lochinjektionseffizienz in die Mehrfachquantentöpfe (MQWs) entsprechend erhöht. Die erhöhte Lochkonzentration innerhalb des MQW-Bereichs kann effizienter mit Elektronen rekombinieren, um die strahlende Rekombination zu begünstigen, was zu einem verringerten Elektronenleckstromniveau führt. Als Ergebnis wird die externe Quanteneffizienz für die vorgeschlagene DUV-LED-Struktur um 100 % erhöht und die nahezu wirkungsgradabfallfreie DUV-LED-Struktur wird experimentell erhalten.
Hintergrund
UV-Strahlen im Wellenlängenbereich von 200 nm bis 280 nm haben potenzielle Anwendungen in Wasserreinigungssystemen gefunden [1, 2]. In Anbetracht der niedrigen DC-Treiberspannung und der besseren Kompatibilität mit dem Wasserreinigungssystem werden AlGaN-basierte tief-ultraviolette Leuchtdioden (DUV-LEDs) als hervorragender Kandidat ausgewählt. Es ist erwähnenswert, dass die Behandlung des Wassers mit einem großen Volumen erfordert, dass das Reinigungssystem die leistungsstarke UVC-Lichtquelle bereitstellt. Allerdings ist die externe Quanteneffizienz (EQE) für AlGaN-basierte DUV-LEDs mit einer Emissionswellenlänge kürzer als 280 nm derzeit nicht erfüllt [3]. Der größte limitierende Faktor für die schlechte EQE ergibt sich teilweise aus der großen Threading Dislokationsdichte (TDD) in den Al-reichen Quantentöpfen [2, 3]. Die interne Quanteneffizienz (IQE) nimmt schnell ab, sobald die TDD in der Größenordnung von 10 9 . liegt cm −2 [3]. Selbst wenn die TDD auf die Größenordnung von 10 8 reduziert wird cm −2 die einen IQE von 60~80% ermöglichen kann, kann der Effekt des Effizienzabfalls dazu führen, dass der EQE für die blanken UVC-LEDs niedriger als 5% ist, wenn die Injektionsstromdichte 80 A/cm überschreitet 2 [4]. Beachten Sie, dass die Lichtextraktionseffizienz (LEE) für blanke UVC-LED-Chips nach FDTD-Berechnungen ~ 10% beträgt [5]. Eine der führenden Interpretationen für den Wirkungsgradabfall von III-Nitrid-basierten LEDs ist der Elektronenüberlauf in die Lochinjektionsschicht vom p-Typ [6]. Die Al-reiche AlGaN-Lochinjektionsschicht vom p-Typ besitzt eine freie Lochkonzentration von sogar weniger als 1 × 10 17 cm −3 [7], was dazu neigt, ein stärkeres Elektronenleck zu verursachen. Mehnkeet al. haben die parasitäre Emission gemessen, die in der Lochinjektionsschicht vom p-Typ stattfindet, und die parasitäre Emission wird gut dem Elektronenleck zugeschrieben [8]. Um den Elektronenaustritt aus den multiplen Quantentrogs (MQWs) zu reduzieren, kann man die Elektroneneinfangrate erhöhen, indem man einzelne Spikeschichten in die Quantenbarrieren einfügt [9]. Die Spikeschichten besitzen eine höhere Al-Zusammensetzung als die Quantenbarriere, so dass das durch Polarisation induzierte elektrische Feld in den Spikeschichten die Driftgeschwindigkeit der Elektronen gut reduzieren kann. Die verbesserte Einfangeffizienz wird daher nur ermöglicht, wenn die DUV-LED entlang der [0001]-Orientierung aufgewachsen wird. Ein weiteres wirksames Verfahren zur Erhöhung der Elektroneneinfangrate besteht darin, den Leitungsbandversatz zwischen der Quantenbarriere und dem Quantentopf zu erhöhen, was durch geeignetes Erhöhen der Al-Zusammensetzung [10] realisiert werden kann, während die Quantenbarrierenarchitektur weiter entwickelt werden kann, indem die Al-Zusammensetzung bewertet [11]. Wie zuvor erwähnt, ist die Konzentration freier Löcher für die Al-reiche p-Typ-AlGaN-Lochinjektionsschicht niedrig, was zu einer schlechten Lochinjektionsfähigkeit in den MQW-Bereich führt. Die schlechte Lochinjektion wird auch als Ursache des Elektronenlecks angesehen [12]. Eine vielversprechende Methode zur Erhöhung der thermionischen Lochemission über die p-Elektronenblockierschicht (p-EBL) besteht darin, die Löcher durch Anwenden des elektrischen Feldreservoirs mit Energie zu versorgen [13]. Der Lochtransport kann auch begünstigt werden, wenn die p-AlGaN-basierte Lochinjektionsschicht mit der treppenförmigen Al-Zusammensetzung für DUV-LEDs verwendet wird [14]. Die gestufte Al-Zusammensetzung kann weiter durch die abgestufte Al-Zusammensetzung für die AlGaN-Schicht ersetzt werden, um die Lochkonzentration zu erhöhen [15,16,17]. Neben der Konstruktion der Lochinjektionsschicht wurden auch alternative p-EBLs vorgeschlagen, um den Lochblockierungseffekt zu reduzieren, z. B. das Einfügen einer dünnen AlGaN-Schicht mit einer geringeren Al-Zusammensetzung [18]. Eine sehr wichtige Struktur für den p-EBL-Kandidaten ist das Übergitter-p-EBL. Es wurden enorme Forschungsanstrengungen unternommen, um die Auswirkungen des GaN/AlGaN-Übergitters für blaue LEDs auf GaN-Basis zu untersuchen [19,20,21]. Nichtsdestotrotz weist das AlGaN-p-EBL für blaue LEDs eine AlN-Zusammensetzung von weniger als 20 % auf, wodurch der Lochblockierungseffekt für blaue LEDs nicht so stark ausgeprägt ist wie für DUV-LEDs. Daher ist die EQE-Verbesserung kleiner als 20 % und der Wirkungsgradabfall ist immer noch offensichtlich, selbst wenn das GaN/AlGaN-Übergitter p-EBL für blaue LEDs verwendet wird. DUV-LEDs verwenden Al-reiche p-EBLs, was zu einem noch schwierigeren Problem der Lochinjektion führt [1]. Um den durch Al-reichen p-EBL verursachten Lochblockierungseffekt zu lösen, wird auch für DUV-LEDs ein Übergitter-p-EBL vorgeschlagen, z. B. AlInGaN/AlGaN-Übergitter p-EBL [22] und AlGaN/AlGaN-Übergitter p-EBL [23]. Der experimentelle Nachweis des Übergitter-p-EBL, das zu einer hohen und nahezu wirkungsgradabfallfreien EQE beiträgt, fehlt jedoch für DUV-LEDs in diesem Stadium. Daher demonstriert diese Arbeit experimentell die Wirksamkeit eines speziell entwickelten AlGaN/AlGaN-Übergitter-p-EBL bei der Verbesserung des EQE und der signifikanten Unterdrückung des Effizienzabfalls für DUV-LEDs. Die verbesserte EQE wird gut auf die verbesserte Lochinjektion in den MQW-Bereich zurückgeführt, während das verringerte Elektronenleckniveau dazu beiträgt, den Wirkungsgradabfall bemerkenswert zu unterdrücken. Der detaillierte Mechanismus wird später in dieser Arbeit vorgestellt.
Methoden/Experimental
Die beiden DUV-LED-Architekturen (LEDs A und B wie in Abb. 1) in dieser Arbeit werden auf der AlN-Vorlage durch ein metallorganisches chemisches Gasphasenabscheidungssystem (MOCVD) aufgewachsen. Das 4 µm dicke AlN-Templat wird auf dem [0001]-orientierten Saphirsubstrat unter Verwendung des Hydride Vapor Phase Epitaxy (HVPE)-Verfahrens aufgewachsen. Wir bauen AlN/Al0,50 über 20 Perioden an Ga0,50 N-Übergitter auf dem AlN-Templat, das als Zugentlastungsschicht für die nachfolgend aufgewachsene Epi-Schicht dient. Ein 2 μm dickes n-Al0,60 Ga0,40 N-Schicht mit einer Elektronenkonzentration von 1 x 10
18
cm
−3
wird angebaut, um Elektronen bereitzustellen. Die DUV-Photonen werden durch Al0,45 . mit fünf Perioden erzeugt Ga0,55 N/Al0,56 Ga0.44 N MQWs mit 3 nm dickem Al0,45 Ga0,55 N Quantentöpfe und 12 nm dickes Al0,56 Ga0.44 N Quantenbarrieren. Die MQWs werden dann von einem 10 nm dicken p-EBL auf AlGaN-Basis abgedeckt. In unserem Experiment entwerfen und züchten wir zwei Arten von p-EBLs für die LEDs A bzw. B. LED A besitzt einen Al0,60 Ga0,40 N-basierte p-EBL und LED B haben ein 1-nm-Al0,45 . mit fünf Perioden Ga0,55 N/1-nm Al0,60 Ga0,40 N-basiertes p-EBL. Beachten Sie, dass unsere Übergitter-p-EBL-Schleife bei Al0,45 . beginnt Ga0,55 N dünne Schicht nach dem Wachsen des letzten Al0.56 Ga0.44 N-Quantenbarriere. Dadurch wird die Grenzfläche der letzten Quantenbarriere/Übergitter-p-EBL polarisiert, indem durch negative Polarisation induzierte Schichtladungen erzeugt werden, was dazu beiträgt, die Elektronenansammlung in der letzten Quantenbarriere zu vermindern und den Elektronenverlust weiter zu unterdrücken. Auf die p-EBL folgt dann eine 50 nm p-Al0,40 Ga0.60 N/50 nm p-GaN-Lochlieferant. Zuletzt wird die p-GaN-Schicht mit einem 10 nm dicken stark Mg-dotierten p
+
. beschichtet -GaN-Schicht. Die DUV-LED-Wafer werden bei einer Temperatur von 800 °C im N2 . thermisch in situ getempert 15 min bei Raumtemperatur, um die H-Mg-Bindungen zu spalten. Die Lochkonzentration wird dann grob auf 1 × 10
17
. geschätzt cm
−3
und 3 × 10
17
cm
−3
für die Al-reiche p-AlGaN-Schicht bzw. die p-GaN-Schicht 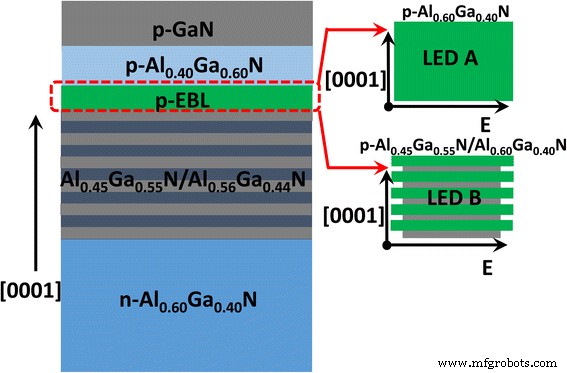
Schematische Architekturstrukturen für die untersuchten LEDs. Die skizzierten Energiebanddiagramme für die beiden p-EBLs werden ebenfalls bereitgestellt:LED A hat das p-Al0,60 Ga0,40 N-basierte EBL und LED B haben das p-Al0,45 Ga0,55 N/Al0,60 Ga0,40 N Übergitter EBL. Das p-Al0,45 Ga0,55 N/Al0,60 Ga0,40 N-Übergitter-EBL ist speziell so konzipiert, dass es das dünne p-Al0,45 . initiiert Ga0,55 N-Schicht, so dass die Grenzfläche für das p-Al0,45 Ga0,55 N/Al0,56 Ga0.44 Die letzte Quantenbarriere N besitzt Grenzflächenladungen mit negativer Polarisation. E bedeutet Energieniveau.
Die DUV-LED-Wafer werden nach einem standardmäßigen Mikrofertigungsprozess zu DUV-LED-Chips verarbeitet. Die Mesa wird durch Ätzen mit induktiv gekoppeltem Plasma (ICP) erhalten und die Mesagröße beträgt 650 × 320 μm 2 . Auf dem n-Al0,60 . wird ein Ti/Al-Metallstapel abgeschieden Ga0,40 N-Schicht, die dann in N2 . getempert wird für 1 min bei einer Temperatur von 900 °C. Die Mesa-Oberfläche wird mit einer Ni/Au-Stromverteilung beschichtet und dann in O2 . geglüht 5 min bei einer Temperatur von 550 °C. Schließlich scheiden wir Ti/Al/Ni/Au-Metalle gleichzeitig auf der Ti/Al-Legierung und der Ni/Au-Stromverteilungsschicht ab, die als n-Elektrode bzw. reflektierende p-Elektrode dient. Die DUV-LED-Chips sind Flip-Chip-Bauelemente, und die DUV-Photonen werden von der Saphirseite durch eine Ulbrichtkugel gesammelt.
Um den detaillierten Ursprung des verbesserten EQE und des unterdrückten Wirkungsgradabfalls besser aufzudecken, werden numerische Berechnungen unter Verwendung des APSYS-Pakets durchgeführt [13, 18]. Wichtige physikalische Parameter, die verwendet werden, um die Trägerrekombinationsereignisse und den Trägerverlust zu berechnen, umfassen die Shockley-Read-Hall (SRH)-Rekombinationslebensdauer, den Auger-Rekombinationskoeffizienten, das Energieband-Offset-Verhältnis für AlGaN/AlGaN-Grenzflächen und das Polarisationsniveau für [0001 ]-orientierte III-Nitrid-Strukturen, die auf 10 ns, 1 × 10 –30 . eingestellt sind cm 6 s −1 , 50:50 bzw. 40 % [13, 18]. Der LEE wird für nackte DUV-LED-Chips mit 50 nm dicker absorbierender p-GaN-Schicht auf 10 % gesetzt [5].
Ergebnisse und Diskussionen
Die experimentell gemessenen Elektrolumineszenz(EL)-Spektren bei unterschiedlicher Stromdichte für die LEDs A und B sind in Abb. 2a dargestellt. Die EL-Spektren werden im gepulsten Zustand mit einem Tastverhältnis von 0,1% aufgenommen, um den Selbsterwärmungseffekt zu vermeiden. Abbildung 2a zeigt, dass die Spitzenemissionswellenlänge für beide DUV-LED-Geräte ~ 270 nm beträgt. Die Spitzenemissionswellenlänge ist innerhalb des getesteten Strombereichs aufgrund der Eliminierung des Eigenerwärmungseffekts stabil. Die EL-Intensität für LED B ist stärker als die für LED A. Abbildung 2b zeigt die optische Leistung und die EQE als Funktion der Injektionsstromdichte, was veranschaulicht, dass die EQE um ~ 90 % verbessert wird. Darüber hinaus betragen die Effizienzabfallwerte für die LEDs A und B bei einer Stromdichte von 110 A/cm 2 . ~ 24 und ~ 4 % , bzw. [droop = (EQE max − EQE J )/EQE max , in dem EQE max und EQE J bezeichnen die maximale EQE und die EQE bei der Stromdichte von J ]. Abbildung 2c zeigt die numerisch berechnete optische Leistungsdichte und den EQE in Bezug auf die Injektionsstromdichte. Die numerisch berechneten Ergebnisse und die experimentell gemessenen stimmen gut miteinander überein, sodass LED B die verbesserte EQE und einen deutlich reduzierten Wirkungsgradabfall zeigt. Die Übereinstimmung zwischen Abb. 2b und 2c validiert die physikalischen Modelle und die Parameter, die wir für die Berechnungen festlegen.
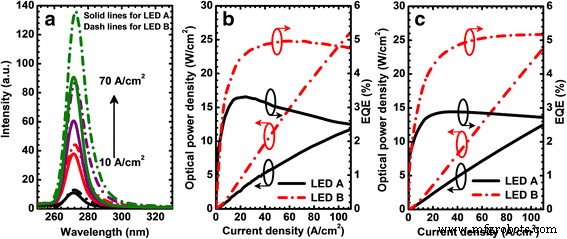
a Gemessene EL-Spektren bei Stromdichten von 10, 30, 50 und 70 A/cm 2 . b Gemessene optische Leistung und EQE. c Berechnete optische Leistung und EQE für LEDs A bzw. B
Die beiden DUV-LEDs unterscheiden sich nur im p-EBL voneinander. Daher ist es erforderlich, die Rolle des Übergitters p-EBL bei der Verbesserung der optischen Leistung für LED B zu untersuchen. Abbildung 3a zeigt die Lochkonzentrationsprofile über den MQW-Bereich für LEDs A und B bei einer Stromdichte von 50 A/cm 2 . Es wird gezeigt, dass das Lochkonzentrationsniveau innerhalb der MQWs für LED B höher ist als das für LED A. Wie berichtet wurde, reduziert die p-EBL das Elektronenleckniveau und verhindert gleichzeitig die Lochinjektion [24]. Ein nützlicher Ansatz, um den Lochblockierungseffekt zu reduzieren, besteht darin, die Lochkonzentration innerhalb der p-EBL-Region zu erhöhen, was dann hilft, die Höhe der Valenzbandbarriere zu verringern [25]. Abbildung 3b zeigt dann die Lochkonzentrationsniveaus in den p-EBLs und dem p-Al0,40 Ga0.60 N Schichten für LEDs A und B bei einer Stromdichte von 50 A/cm 2 . Die durchschnittliche Lochkonzentration im Übergitter p-EBL für LED B ist um zwei Größenordnungen viel höher als die für LED A. Die größere Lochkonzentration im Übergitter p-EBL wird gut auf den ausgezeichneten Lochtransport zurückgeführt. Interessanterweise stellen wir bei näherer Betrachtung von Abb. 3b fest, dass die Lochkonzentration bei p-EBL/p-Al0,40 Ga0.60 Die N-Grenzfläche wird für LED A niedriger, was auch die glattere Lochinjektionseffizienz durch das Übergitter p-EBL für LED B widerspiegelt.

Numerisch berechnete Lochkonzentrationsprofile a in den MQWs und b in den Lochinjektionsschichten vom p-Typ für LEDs A bzw. B; c experimentell gemessene EL-Spektren im halblogarithmischen Maßstab bei Stromdichten von 10, 30, 50 und 70 A/cm 2 für LEDs A bzw. B; d numerisch berechnete Elektronenkonzentrationsniveaus in den Lochinjektionsschichten vom p-Typ für LEDs A und B. Numerisch berechnete Daten werden bei einer Stromdichte von 50 A/cm 2 . gesammelt
Wie bereits erwähnt, hängt die Effizienz von LEDs eng mit dem Elektronenleckpegel zusammen. Daher zeigen wir die gemessenen EL-Spektren für die LEDs A und B in einer halblogarithmischen Skala (siehe Abb. 3c), um die detaillierten Informationen zur parasitären Lumineszenz anzuzeigen. Die Spitzenemissionswellenlänge für die parasitäre Lumineszenz ist bei ~ 425 nm zentriert, was von den tiefen Niveaus herrühren kann, die mit Mg-Dotanden verbunden sind [26]. Die Intensität der parasitären Lumineszenz für LED B ist stärker als die für LED A, und es wird spekuliert, dass mehr Ladungsträger in den tiefen Ebenen rekombinieren. In unserem Experiment werden die Lochinjektionsschichten vom p-Typ für beide DUV-LED-Architekturen nicht konstruiert, und das Lochkonzentrationsniveau in den Lochinjektionsschichten soll ähnlich sein. Daher wird festgestellt, dass Elektronen, die aus dem MQW-Bereich entweichen, eine höhere Konzentration in der Lochinjektionsschicht für LED B aufweisen als diejenigen für LED A. Unsere Vorschläge werden weiter durch Abb. 3d unterstützt, die die Elektronenkonzentrationsprofile in der p- zeigt. Typ Lochinjektionsschichten für LEDs A und B bei einer Stromdichte von 50 A/cm 2 . Dies bedeutet auch, dass der Elektronenleckstrom dank des Übergitters p-EBL für LED B deutlich reduziert wurde.
Anschließend präsentieren wir die berechneten Profile der Strahlungsrekombinationsrate für die LEDs A und B in Abb. 4, die bei der aktuellen Dichte von 50 A/cm 2 . gesammelt wurden . Es wird gefolgert, dass die Strahlungsrekombinationsrate für LED B dank des vorgeschlagenen Supergitters p-EBL stärker ist als die von LED A, was die Lochinjektion in die MQW-Region noch mehr begünstigt und das Elektronenleckniveau in der Zwischenzeit unterdrückt.
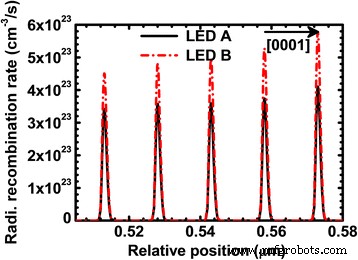
Numerisch berechnete Profile der Strahlungsrekombinationsrate für LEDs A und B. Die Daten werden bei der aktuellen Dichte von 50 A/cm 2 . gesammelt
Abbildung 5a und 5b zeigen das Energieband in der Nähe der p-EBLs für beide DUV-LED-Geräte. Die Energiebänder werden bei einer Stromdichte von 50 A/cm 2 . berechnet . Wie von Zhang et al. [27] können die starken polarisationsinduzierten positiven Ladungen an der letzten Quantenbarriere/p-EBL-Grenzfläche Elektronen signifikant anziehen, was zu einer hohen lokalen Elektronenkonzentration führt. Die hohe lokale Elektronenkonzentration kann die effektive Höhe der Leitungsbandbarriere (Ø e ) für das p-EBL, das ~ 295 meV für LED A beträgt. Wenn das p-EBL auf Basis von Bulk-AlGaN durch das spezifische Übergitter-p-EBL in dieser Arbeit ersetzt wird (dh die p-EBL-Schleife des Übergitters beginnt von der dünnen AlGaN-Schicht mit einer kleineren Energiebandlücke als die letzte AlGaN-Quantenbarriere), wird das Leitungsband für die letzte Quantenbarriere nach oben betitelt (siehe Abb. 5b), und dies begünstigt eine Elektronenverarmung in der letzten Quantenbarriere, die dann die . erhöht Ø e bis ~ 391 meV und ermöglicht einen kleineren Elektronenaustritt durch thermionische Emission [28]. Darüber hinaus erleichtert das Übergitter p-EBL den Intraband-Tunnelprozess für Löcher, wodurch auch die Lochkonzentration im p-EBL höher wird (siehe Abb. 3b) Die erhöhte Lochkonzentration im p-EBL für LEDs neigt dazu, die effektive Höhe der Valenzbandbarriere zu verringern (Ø h ) [25], d. h. die Werte von Ø h sind ~ 324 meV und ~ 281 meV für LEDs A bzw. B bei einer Stromdichte von 50 A/cm 2 . Das noch kleinere Ø h für LED B wiederum begünstigt die thermionische Emission für Löcher. Es ist erwähnenswert, dass das Übergitter-p-EBL auch das Intraband-Tunneln für Elektronen verursachen kann. Glücklicherweise kann die verbesserte Lochkonzentration in der MQW Elektronen durch strahlende Rekombination besser verbrauchen, was auch dazu beiträgt, den Elektronenverlust zu verringern [12]. Aufgrund der begünstigteren Lochinjektion und des noch stärkeren Rekombinationsstroms, der durch den strahlenden Rekombinationsprozess im MQW-Bereich erzeugt wird, wird die Durchlassspannung für LED B kleiner als für LED A gemäß Fig. 5c.
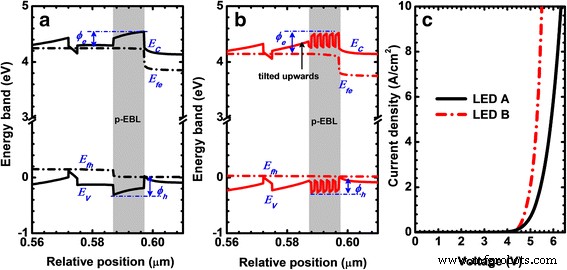
Numerisch berechnete Energiebandprofile in der Nähe von a Bulk-AlGaN-basiertes p-EBL für LED A, b Übergitter p-EBL für LED B und c gemessene Stromdichte in Bezug auf die angelegte Vorspannung für LEDs A und B. Daten für a und b werden bei einer Stromdichte von 50 A/cm 2 . berechnet . E C , EV , Ø e , und Ø h bezeichnen das Leitungsband, das Valenzband und die effektiven Barrierehöhen für Leitungsband bzw. Valenzband
Schlussfolgerungen
Zusammenfassend wurde in dieser Arbeit ein spezifisches Übergitter-p-EBL für DUV-LEDs beschrieben, das sowohl die geförderte Lochinjektionseffizienz als auch die verringerte Elektronenleckage in die passive p-Typ-Lochinjektionsschicht aufrechterhalten kann. Daher werden sowohl numerisch als auch experimentell die verbesserte EQE und der bemerkenswert unterdrückte Wirkungsgradabfall erhalten. Wir sind fest davon überzeugt, dass die vorgeschlagene DUV-LED-Struktur sehr vielversprechend für die Realisierung hocheffizienter DUV-LEDs ist und die durch diese Arbeit enthüllte Gerätephysik zu einem besseren Verständnis der III-Nitrid-basierten optoelektronischen Gemeinschaft führt.
Abkürzungen
- APSYS:
-
Erweiterte physikalische Modelle von Halbleiterbauelementen
- DUV:
-
Leuchtdioden im tiefen Ultraviolett
- EL:
-
Elektrolumineszenz
- EQE:
-
Externe Quanteneffizienz
- HVPE:
-
Hydrid-Dampfphasen-Epitaxie
- ICP:
-
Induktiv gekoppeltes Plasma
- IQE:
-
Interne Quanteneffizienz
- LEE:
-
Lichtextraktionseffizienz
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- MQWs:
-
Mehrere Quantentöpfe
- p-EBL:
-
p-Typ-Elektronenblockierschicht
- TDD:
-
Einfädelungsversetzungsdichte
Nanomaterialien
- Das Design der Emissionsschicht für Elektronenvervielfacher
- Hochleitfähige PEDOT:PSS transparente Lochtransportschicht mit Lösungsmittelbehandlung für Hochleistungs-Silizium/organische Hybridsolarzellen
- Grüne Synthese von InP/ZnS-Kern/Schale-Quantenpunkten für die Anwendung in schwermetallfreien Leuchtdioden
- Hocheffiziente invertierte Perowskit-Solarzellen mit CdSe-QDs/LiF-Elektronentransportschicht
- Elektrisch leitfähiger TPU-Nanofaserverbundstoff mit hoher Dehnbarkeit für flexiblen Dehnungssensor
- Perowskit-Leuchtdioden mit hoher Leuchtdichte mit hochpolarem Alkohollösungsmittel, das PEDOT:PSS als Lochtransportschicht behandelt
- UV-Behandlung von bei niedriger Temperatur verarbeiteten SnO2-Elektronentransportschichten für planare Perowskit-Solarzellen
- Über die p-AlGaN/n-AlGaN/p-AlGaN-Stromaufweitungsschicht für AlGaN-basierte tief ultraviolette Leuchtdioden
- Theoretisches System triboelektrischer Nanogeneratoren im Kontaktmodus für hohe Energieumwandlungseffizienz
- Einfluss der Quanten-Well-Breite auf die Elektrolumineszenz-Eigenschaften von AlGaN-Tiefen-Ultraviolett-Leuchtdioden bei verschiedenen Temperaturen



