Neueste Fortschritte bei β-Ga2O3-Metallkontakten
Zusammenfassung
Beta-Galliumoxid mit extrem großer Bandlücke (β-Ga2 O3 ) hat als vielversprechendes Halbleitermaterial für die Leistungselektronik der nächsten Generation große Aufmerksamkeit auf sich gezogen. Es besitzt hervorragende Materialeigenschaften wie eine große Bandlücke von 4,6–4,9 eV, ein hohes elektrisches Durchschlagsfeld von 8 MV/cm und eine außergewöhnliche Baligas Gütezahl (BFOM) sowie eine hervorragende chemische und thermische Stabilität. Diese Eigenschaften weisen auf sein großes Potenzial für zukünftige Anwendungen in Leistungs- und optoelektronischen Geräten hin. Das kritische Problem der Kontakte zwischen Metall und Ga2 O3 begrenzt die Leistung von β-Ga2 O3 Geräte. In dieser Arbeit haben wir die Fortschritte bei den Kontakten von β-Ga2 . überprüft O3 MOSFETs. Zur Verbesserung der Kontakteigenschaften werden vier Hauptansätze zusammengefasst und detailliert analysiert, darunter Vorbehandlung, Nachbehandlung, Mehrschicht-Metallelektrode und Einbringen einer Zwischenschicht. Im Vergleich dazu werden die beiden letztgenannten Verfahren intensiver untersucht und sind günstiger als die Vorbehandlung, die unweigerlich unkontrollierbare Schäden erzeugen würde. Abschließend werden Schlussfolgerungen und zukünftige Perspektiven zur weiteren Verbesserung ohmscher Kontakte vorgestellt.
Einführung
Vor kurzem wurde Galliumoxid (Ga2 O3 ) wurde aufgrund seiner hervorragenden Materialeigenschaften als vielversprechender Kandidat für die Herstellung von Hochleistungs- und Hocheffizienzbauteilen angesehen [1,2,3]. Ga2 O3 hat fünf verschiedene Polymorphe, bezeichnet als α-Ga2 O3 , β-Ga2 O3 , -Ga2 O3 , -Ga2 O3 , und ε-Ga2 O3 , darunter β-Ga2 O3 ist das thermodynamisch stabilste und wurde umfassend untersucht [4]. Mit einer ultrabreiten Bandlücke von 4,6–4,9 eV [5,6,7] ist das theoretische elektrische Durchschlagsfeld (E br ) von 8 MV/cm für β-Ga2 O3 ist etwa dreimal größer als die von SiC oder GaN [8,9,10], was β-Ga2 . ermöglicht O3 -basierte Geräte zum Umgang mit gigantischen Schaltspannungen. Die Eignung von Halbleitern für Anwendungen in Leistungsbauelementen wird in der Regel durch Baligas Leistungszahl (BFOM) [11] bewertet. Der BFOM von β-Ga2 O3 ist fast dreimal so hoch wie bei SiC und GaN, wodurch der Leitungsverlust deutlich reduziert wird [3, 12, 13, 14]. Darüber hinaus wird die Sättigungselektronengeschwindigkeit theoretisch auf etwa 2 × 10 7 . geschätzt cm/s, was ihn für Hochfrequenzbetriebe attraktiv macht [15,16,17,18,19,20]. Ein weiteres besonderes Interesse von β-Ga2 O3 unter den Halbleitern mit großer Bandlücke besteht darin, dass qualitativ hochwertige Einkristalle mit Schmelzwachstumstechniken kostengünstig synthetisiert werden können [21,22,23,24]. Darüber hinaus hochwertiges n-Typ β-Ga2 O3 Epitaxiefilme können durch präzises Dotieren mit Sn, Si, Ge und Mg realisiert werden, und die erhaltene Elektronendichte reicht von 10 16 bis 10 19 cm −3 [25,26,27,28]. Aufgrund der oben genannten Vorteile gegenüber anderen Halbleitern mit großer Bandlücke ist β-Ga2 O3 zeigt seine Fähigkeiten als vielversprechendes Material für die Leistungselektronik sowie für die Elektronik in extremen Umgebungen (hohe Temperaturen, hohe Spannung und starke Strahlung) [29,30,31].
Viele vielversprechende β-Ga2 O3 Es wurde über Bauelemente berichtet, darunter Schottky-Dioden [32], MOSFETs [1,2,3] und verschiedene Arten von Sonnenblind-Photodetektoren [33, 34]. Unter diesen Geräten sind MOSFETs die vorherrschende Konfiguration für den Hochfrequenz- und Hochleistungsbetrieb [35] und geben ihrem hohen E volles Spiel br und BFOM. Eine der Herausforderungen für β-Ga2 O3 Anwendung in MOSFET-Bauelementen ist die Schwierigkeit, ohmsche Kontakte im Vergleich zu Halbleitern mit schmaler Bandlücke zu bilden [36]. Für Hochleistungs-Halbleiterbauelemente ist in der Regel ein hervorragender ohmscher Kontakt zwischen Halbleiter und Metallelektrode unerlässlich [37, 38]. Niederohmige Kontakte könnten den Spannungsabfall am Kontakt reduzieren und folglich die Spannung über den Kanal erhöhen, wodurch die ausgelegte Stromdichte und hohe Schaltgeschwindigkeiten sichergestellt werden. Darüber hinaus tragen niederohmige Kontakte dazu bei, die Wärmeentwicklung zu reduzieren, was den Selbsterwärmungseffekt verstärken könnte.
Folglich ist die Herstellung hochwertiger ohmscher Kontakte eine Voraussetzung für die Erzielung leistungsstarker Geräte. In diesem Aufsatz beginnen wir mit grundlegenden Konzepten von Metall-/Halbleiterkontakten. Im Abschnitt „Ansätze für ohmsche Kontakte“ eine Zusammenfassung der jüngsten bedeutenden Fortschritte bei ohmschen Kontakten für β-Ga2 O3 wird vorgestellt und Ansätze zu Ohmschen Kontakten diskutiert und analysiert. Abschließend werden einige Perspektiven zur Verbesserung der Ohmschen Kontakte zu β-Ga2 . gegeben O3 in der Zukunft.
Grundlagen der Physik ohmscher Kontakte
Ein ohmscher Kontakt ist ein Metall/Halbleiter-Übergang, bei dem es keine Barriere an der Grenzfläche gibt, die den Transport von Trägern behindert, wie in Abb. 1a dargestellt. Im Gegensatz dazu hemmt eine an der Grenzfläche vorhandene Energiebarriere den Ladungsträgertransport zwischen dem Metall und dem Halbleiter, wie aus Abb. 1b ersichtlich ist. Insbesondere sind die zwischen Halbleitern mit großer Bandlücke und Metallen gebildeten Kontakte immer Schottky-Kontakte. Somit hängt der Kontaktwiderstand normalerweise von der Metall/Halbleiter-Schottky-Barrierehöhe (SBH) ab ΦB . Für einen Halbleiter vom n-Typ gehorcht er der Gleichung:
$$ {q\Phi}_B={q\Phi}_m-{\chi}_s $$ (1)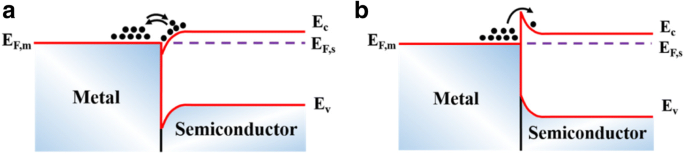
Schematische Darstellungen von a Ohmsche Kontakte und b Schottky-Kontakte. E C , E V , E F , m , und E F , s sind die Energieniveaus der Leitungsbandkante, Valenzbandkante, Fermi-Energie von Metall bzw. Halbleiter
wobei Φm ist die Austrittsarbeit des Metalls und χ s ist die Elektronenaffinität des Halbleiters.
Wie in Gl. (1) ist es wichtig, den SBH zu reduzieren, um den Ohmschen Kontakt zu bilden. Darüber hinaus könnte eine hohe Dotierung in Halbleitern die Bildung ohmscher Kontakte erleichtern, z. B. bei stark dotierten Halbleitern (ND> ~ 10 18 cm −3 ), wird die Barriere schmal genug und ermöglicht es den Elektronen, aufgrund der erheblichen Bandverbiegung des Leitungsbandes [39] direkt durch die Grenzfläche zu tunneln, wie in Abb. 2 gezeigt. Trotzdem können die Dotierungsniveaus, die in β- Ga2 O3 liegen normalerweise unter dem, was in Si erhalten werden kann, wie dies bei anderen breiten Halbleitern der Fall ist. Darüber hinaus spielen die Oberflächenzustände auch eine wichtige Rolle bei der Bildung ohmscher Kontakte, die häufig als Regionen mit hoher Rekombinationsrate definiert werden. Die durch die Oberflächenzustände induzierten Defektniveaus mittlerer Bandlücke können den Transport der Ladungsträger unterstützen. Dies impliziert, dass ein guter ohmscher Kontakt gebildet werden kann, indem geeignete Oberflächenzustände in Halbleiter eingeführt werden [40,41,42,43].
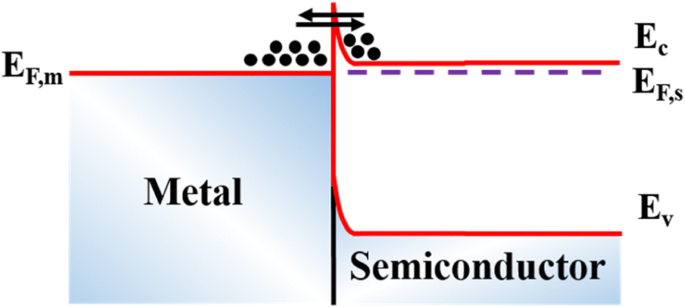
Das Energiebanddiagramm an der Grenzfläche Metall/Halbleiter bei hochdotierten Halbleitern
Zur Beurteilung der Kontaktqualität ist eine elektrische Quantifizierung der Kontakteigenschaften erforderlich. Derzeit beträgt der spezifische Kontaktwiderstand ρ C ist einer der am häufigsten verwendeten Parameter, um auf die Leistung von Ohmschen Kontakten zuzugreifen, normalerweise ausgedrückt in Ω ∙ cm 2 [44]. Der spezifische Kontaktwiderstand ist eine sehr nützliche Größe, die unabhängig von der Kontaktgeometrie ist und sich nur auf die Grenzfläche Metall/Halbleiter bezieht. Bisher das niedrigste ρ C von 4,6 × 10 −6 Ω ∙ cm 2 wurde für Ti/Au-Kontakte zu β-Ga2 . berichtet O3 [45]. Wonget al. erhielt auch einen niedrigen ρ C von 7,5 × 10 −6 Ω ∙ cm 2 mit Ti/Au-Kontakten [46]. Bisher wurden viele Anstrengungen unternommen, um die Kontaktierung mit niedrigen ρ . zu erreichen C , und die typischen Werte für spezifische Kontaktwiderstände verteilen sich über einen Bereich von 10 –5 –10 −6 Ω ∙ cm 2 für gute Ohmsche Kontakte [36].
Ansätze zu Ohmschen Kontakten
Bisherige Untersuchungen zu den intrinsischen Eigenschaften von β-Ga2 O3 wurden meistens an seiner MOSFET-Struktur durchgeführt, bei der normalerweise zwei Arten von Kanalsyntheseverfahren verwendet werden. Eine davon ist die mikromechanisch abgeblätterte Flocke (Nanomembran); das andere ist das epitaktische β-Ga2 O3 Film auf seinem nativen Substrat, wie in Tabelle 1 zusammengefasst.
Normalerweise abgeblättertes β-Ga2 O3 Flakes lassen sich bequem und kostengünstig auf beliebige Substrate übertragen. Es zeigt sich, dass die Materialeigenschaften von β-Ga2 O3 Flocken würden während der Abblätterung nicht degenerieren, wie durch Raman-Spektroskopie und Rasterkraftmikroskopie [19] nachgewiesen wurde, was bedeutet, dass die Leistung von MOSFETs basierend auf den abgeblätterten Flocken vergleichbar ist mit denen auf der Basis von epitaktischen Schichten. Aufgrund dieser Vorteile wird diese Methode empfohlen, um die elektrischen Eigenschaften zu untersuchen, die aus der Dichte der Grenzflächendefekte, der Durchbruchspannung, der optischen Phononenstreuung an der Oberfläche [47,48,49] und der thermischen Eigenschaft, dh dem Selbsterwärmungseffekt, bestehen [50, 51].
Wie in Tabelle 1 zusammengefasst, können Verfahren zur Verbesserung ohmscher Kontakte allgemein in drei Typen eingeteilt werden:(1) Vorbehandlung, (2) Nachbehandlung und (3) Mehrschicht-Metallelektrode. Außerdem können durch das Einbringen einer Zwischenschicht auch überlegene ohmsche Kontakte erzielt werden, die in Tabelle 1 nicht aufgeführt sind.
Vorbehandlung
Die Vorbehandlung wird vor der Metallabscheidung durchgeführt, einschließlich Ionenimplantation, Plasmabeschuss und reaktivem Ionenätzen (RIE). Higashiwakiet al. zeigten, dass die Kontakte, die durch die Verwendung eines Ti/Au-Stapels mit dem RIE-Vorbehandlungsprozess gebildet wurden, ein fast ohmsches Verhalten zeigten, während die Probe ohne die RIE-Behandlung ein Schottky-Verhalten zeigte, wie in Abb. 3 dargestellt [1]. Der signifikante Unterschied könnte auf das Ausdiffundieren der freien Sauerstoffatome zurückgeführt werden, die durch das kontinuierliche Bombardement durch Aufbrechen der freigelegten Ga-O-Bindungen erzeugt wurden und viele Sauerstoffleerstellen hinterlassen, die als Donatoren in β-Ga2 O3 . Andererseits würde die kontinuierliche RIE-Behandlung auch erhebliche Oberflächenzustände erzeugen, die bei der Kontaktbildung eine wichtige Rolle spielen [41]. Abbildung 4 zeigt die zugehörigen DC-Ausgangskennlinien, anhand derer ein quasilinearer Strom bei niedriger Drainspannung beobachtet werden kann. In ihrer späteren Arbeit, wie in Fig. 5 gezeigt, zeigten die Ausgangseigenschaften eine gute Linearitätsbeziehung zwischen dem Strom und der Drainspannung, bei der eine Si-Ionenimplantation und RIE auf β-Ga2 . angewendet wurden O3 zusammen und einen extrem niedrigen spezifischen Kontaktwiderstand von 8,1 × 10 −6 Ω∙cm 2 wurde erreicht [12]. Offensichtlich ist das ohmsche Verhalten von RIE und Si + Implantation zusammen würde die durch RIE nur übertreffen, da bekannt ist, dass Si-Atome flache Donatoren mit kleinen Aktivierungsenergien in β-Ga2 . sind O3 [34]. Außerdem haben Zhou et al. berichtete über das Hochleistungs-β-Ga2 O3 Feldeffekttransistoren mit Ar-Plasmabeschuss vor der Kontaktmetallabscheidung [52]. Im Gegensatz dazu zeigte die Probe ohne Ar-Beschuss einen Schottky-Kontakt. Der Unterschied kann der Erzeugung von Sauerstoffleerstellen und Oberflächenzuständen während des Ar-Plasma-Bombardierungsprozesses zugeschrieben werden, genau wie bei der RIE-Behandlung.
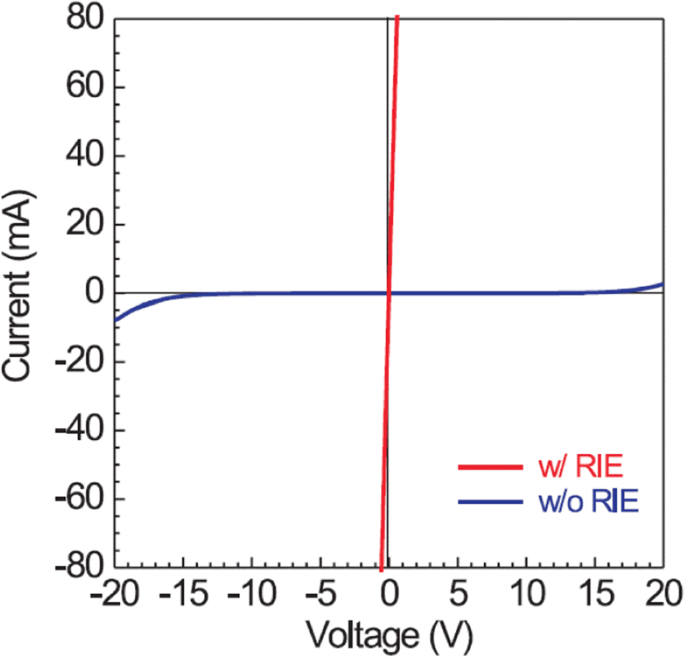
(Farbe online) I-V-Kurven gemessen zwischen zwei Kontakten (wie abgeschiedenes Ti/Au), hergestellt mit und ohne RIE-Behandlung auf n-Ga2 O3 Substrate. Reproduziert aus Ref.-Nr. [1]
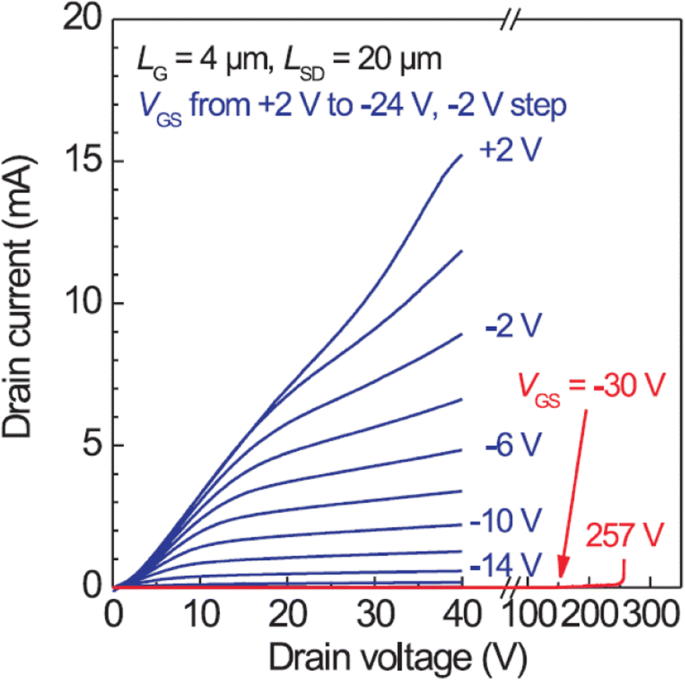
(Farbe online) DC-Ausgangscharakteristik von Ga2 O3 Metall/Halbleiter-Feldeffekttransistoren. Reproduziert aus Ref.-Nr. [1]
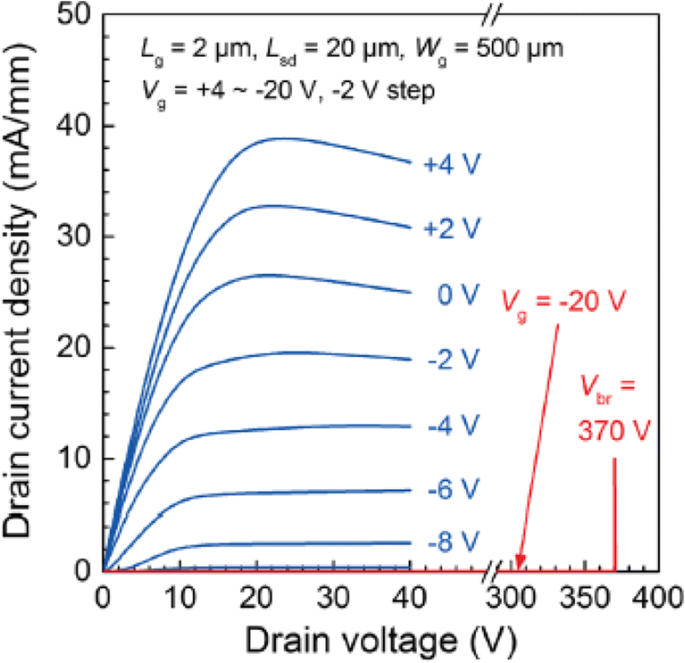
DC I-V-Kurven von Ga2 O3 MOSFET (L g = 2 μm) gemessen bei RT. Reproduziert aus Ref.-Nr. [12]
Obwohl die oben genannten Techniken die Leistung ohmscher Kontakte verbessern können, sind solche Technologien praktisch nicht anwendbar, da der induzierte Schaden in der Regel das Letzte ist, was Verfahrensingenieure bei Halbleiterbauelementen wollen, und außerdem sind die schadensinduzierten ohmschen Kontakte nicht immer reproduzierbar.
Aus diesem Grund wurde neben den oben genannten traditionellen Techniken, die häufig zur Bildung niederohmiger ohmscher Kontakte verwendet werden, kürzlich eine relativ neue Technik – Spin-on-Glass (SOG)-Dotierung – eingeführt [53] und einen spezifischen Kontaktwiderstand von 2,1 ± 1,4 × 10 −5 Ω∙cm 2 wurde erreicht, was die Wirksamkeit der SOG-Dotierungstechnik bestätigte. Abbildung 6 zeigt die Ausgangseigenschaften von SOG-dotiertem β-Ga2 O3 MOSFETs, die ein ausgezeichnetes lineares Verhalten bei niedriger Drainspannung zeigten. Im Vergleich zur Ionenimplantation reduziert die SOG-Dotierung die schadensinduzierte Diffusion von Spezies und senkt die Kosten durch den Verzicht auf den teuren Ionenimplantierer. Ähnlich wie bei der Ionenimplantation besteht das Grundprinzip dieser Technologie darin, den S/D-Bereich mit flachen Donatoren zu dotieren. Offensichtlich kann der überlegene ohmsche Kontakt mit absichtlich dotiertem β-Ga2 . erreicht werden O3 . Zum Beispiel das hochdotierte β-Ga2 O3 wurde verwendet, um β-Ga2 . herzustellen O3 Feldeffekttransistoren mit Drainströmen über 1,5 A/mm [50]. Der rekordhohe Drainstrom ist auf die starke Dotierung in β-Ga2 . zurückzuführen O3 was zu einer sehr dünnen Verarmungsschicht führt, und Elektronen können leicht durch diese Barriere hindurchtunneln, was zu einem ohmschen Kontaktverhalten führt. Interessanterweise ist die Orientierung des β-Ga2 O3 Auch die Oberfläche kann einen Einfluss auf das Kontaktierungsverhalten haben. Baiket al. berichteten, dass dieselben Elektroden auf β-Ga2 O3 zeigten unterschiedliche Kontakteigenschaften, wobei sich die Probe auf (\( \overline{2} \)01) als ohmsche Kontakte verhielt, während die Kontrollprobe auf (010) Schottky-Verhalten zeigte. Dies könnte auf das unterschiedliche Ga/O-Verhältnis und die Dichte der freien Bindungen bei bestimmten Orientierungen zurückgeführt werden [54].
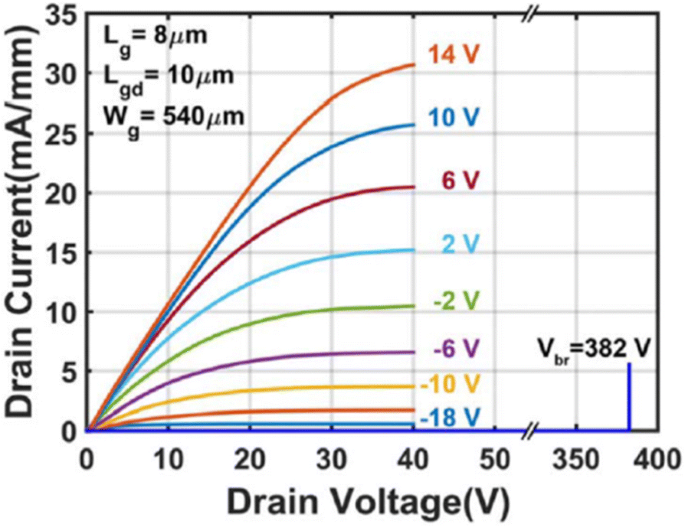
Ausgangscharakteristik des SOG S/D-dotierten MOSFET mit L g = 8 μm, Drain-Gate-Abstand L gd = 10 μm. Reproduziert aus Ref.-Nr. [53]
Nachbehandlung
Die Nachbehandlung erfolgt nach der Metallabscheidung und bezieht sich hauptsächlich auf den Glühprozess. Glühen spielt eine Rolle bei der Reduzierung von Schäden, die durch frühere Prozesstechnologien wie Ionenimplantation und Plasmabeschuss verursacht wurden. Darüber hinaus trägt es zur Bildung einer Zwischenschicht bei, die die Leitungsbanddiskontinuität zwischen dem Metall und β-Ga2 . verringern kann O3 . Bemerkenswerterweise üben die Parameter wie Temperatur, Atmosphäre und Glühzeit einen wichtigen Einfluss auf die Leistung der Geräte aus. Das Experiment zum Glühen in Luft und N2 wurde implementiert, um die Wirkung der Glühatmosphäre auf β-Ga2 . zu vergleichen O3 -basierte Ohmsche Kontakte [55]. Wie in Abb. 7 zu sehen ist, ist die Glühleistung in N2 übertraf die in Luft, was darauf zurückzuführen war, dass der höhere Sauerstoffpartialdruck in der Luft die Bildung von Sauerstoffleerstellen unterdrückte. Die Abhängigkeit der Kontakteigenschaften von Temperatur, Atmosphäre und Glühzeit von den Kontakteigenschaften ist jedoch unklar; daher ist es weiterhin erforderlich, die Parameter des Glühprozesses zu optimieren.
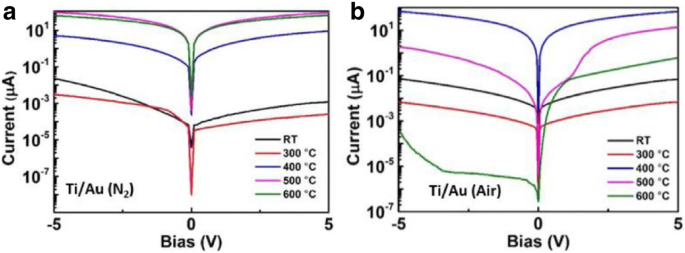
Elektrische Eigenschaften von β-Ga2 O3 Flakes mit unterschiedlicher thermischer Glühatmosphäre und Glühtemperatur. Ti/Au-Kontakte unter a N2 und b Luft. Reproduziert aus Ref.-Nr. [55]
Mehrschichtige Metallelektrode
Ein anderer Ansatz zum Bilden ohmscher Kontakte besteht darin, den SBH an der Metall/Halbleiter-Grenzfläche zu reduzieren. Der SBH entspricht der Differenz zwischen der Austrittsarbeit des Metalls und der Elektronenaffinität des Halbleiters. Basierend auf dieser Erkenntnis könnte man erwarten, dass Metalle mit niedriger Austrittsarbeit ohmsche Kontakte auf β-Ga2 . bilden O3 . Nichtsdestotrotz wurde bewiesen, dass die Austrittsarbeit nicht der dominierende Faktor bei der Bildung des Ohmschen Kontakts ist [56].
Neun Metalle abgeschieden auf β-Ga2 O3 wurden basierend auf den Eigenschaften wie Austrittsarbeit, Schmelztemperatur und Oxidstabilität ausgewählt [57]. Die Metallaustrittsarbeit von Ti und die Elektronenaffinität von unbeabsichtigt dotiertem β-Ga2 O3 sind bekannt als 4,33 eV bzw. 4,00±0,05 eV [19, 58, 59], sodass eine Barriere von 0,22 eV an der Grenzfläche zum Schottky-Kontakt bestehen sollte. Nichtsdestotrotz stellte sich heraus, dass Ti-Kontakte mit einer Au-Deckschicht ohmsch waren mit dem niedrigsten Widerstand von neun Metallen nach dem Glühen. Inzwischen haben Bae et al. untersuchte die Abhängigkeit der Kontakteigenschaften von Ti/Au und Ni/Au für Bauelemente basierend auf dem abgeblätterten β-Ga2 O3 Flocken [55]. Es wurde beobachtet, dass die Leistung von MOSFETs mit Ti/Au-Metallelektroden die mit Ni/Au-Metallelektroden unter den gleichen Glühbedingungen übertraf. Zu Beginn wurde angenommen, dass die Austrittsarbeit von Ni und Ti 5,01 eV bzw. 4,33 eV beträgt, sodass Ti leichter einen ohmschen Kontakt bilden kann als Ni; Studien mit energiedispersiver Spektroskopie (EDS) zeigten jedoch, dass der Sauerstoffatomanteil im β-Ga2 O3 Die Region nahm ab, während der Sauerstoffatomprozentsatz in Ti in der Nähe der Grenzfläche nach dem Tempern zunahm, wie in Abb. 8 dargestellt [55]. Dieses Phänomen wird der Ausdiffusion von Sauerstoffatomen aus β-Ga2 . zugeschrieben O3 in Ti-Metall, was zur Bildung von Sauerstoffleerstellen führt, die als Donatoren wirken. Darüber hinaus wird während des Glühprozesses die beschleunigte Ausdiffusion von Sauerstoffatomen in β-Ga2 O3 könnte mit Ti reagieren und Ti2 . bilden O3 was aufgrund seiner geringen Austrittsarbeit (3,6–3,9 eV) für die Bildung ohmscher Kontakte nützlich ist. Daher ist die Grenzflächenreaktion zwischen Metallen und β-Ga2 O3 ist ein wichtiger Faktor bei der Bildung ohmscher Kontakte an der Grenzfläche Metall/Halbleiter.
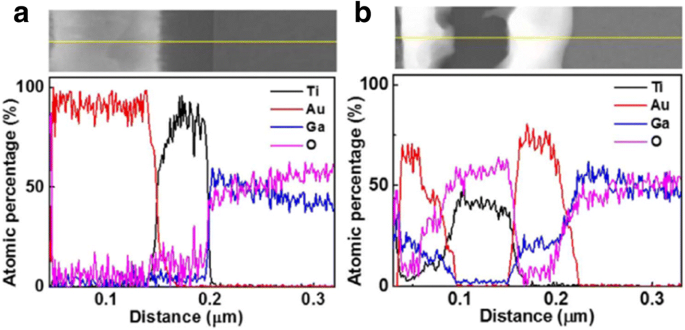
Atomprozentprofile durch EDS von Metallisierung und β-Ga2 O3 a vor- und b Nachglühen bei einer Temperatur von 500 ° C. Reproduziert aus Ref.-Nr. [55]
Darüber hinaus wurde festgestellt, dass die meisten Ti/Au-Metallelektroden, die zur Bildung ohmscher Kontakte verwendet wurden, bei 450 ° . geglüht wurden C [45, 53] oder 470 ° C [12, 46, 57, 60] durch schnelles thermisches Verfahren. Ein ähnliches Verschlechterungsverhalten der Kontakteigenschaften wurde beobachtet, wenn das Tempern über 500 ° . durchgeführt wurde C in Ref.-Nr. [55, 56], wie in den Abbn. 7 und 9 bzw. Yaoet al. spekulierten, dass möglicherweise bei erhöhter Glühtemperatur eine isolierende Oxidschicht gebildet wurde, was zu den verschlechterten Kontakten führte. Trotzdem haben Bae et al. beobachteten, dass die Oberfläche des abgeschiedenen Metalls nach 700 ° . viel rauer war C Annealing aufgrund der Durchmischung von Metallen und der Diffusion von Gallium- und Sauerstoffatomen in Metallelektroden, die als Grund für das Degradationsverhalten zugeschrieben wurde. Offensichtlich sind die Abbaumechanismen von Ti/Au-Kontakten zu β-Ga2 O3 nach Hochtemperaturglühen werden noch diskutiert.
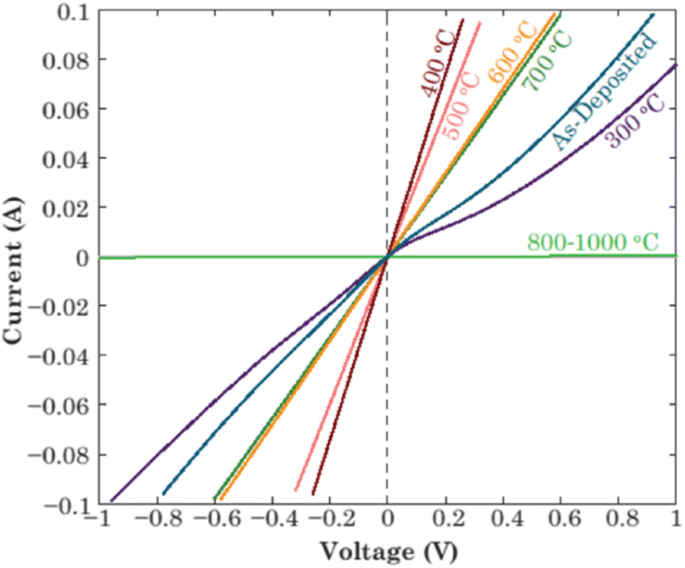
I-V-Plots für Ti/Au-Kontakte auf Sn-dotiertem (\( \overline{2} \)01) Ga2 O3 Wafer als Funktion der Glühtemperatur in Ar (Glühzeit 1 min). Reproduziert aus Ref.-Nr. [56]
β-Ga2 O3 -basierte Geräte mit Ti/Au-Kontakten können die Anforderungen für den Betrieb bei hohen Temperaturen nicht erfüllen. Um eine Verschlechterung der Kontakteigenschaften bei erhöhter Glühtemperatur zu vermeiden, sollten daher komplexere Metallstapel verwendet werden. Bei weitem wurden Ti/Al/Au [50, 52], Ti/Au/Ni [61, 62] und Ti/Al/Ni/Au-Metallstapel [13, 21, 63, 64] verwendet, um elektrische Kontakte auf β-Ga2 O3 . Ein umfassender Vergleich der Kontakteigenschaften zwischen diesen Metallstapeln ist jedoch immer noch unzureichend.
Mohammad [65] und Greco et al. [36] diskutierten die Rolle jeder Metallschicht in den komplexen Metallstapeln und gaben einige Richtlinien zur Verbesserung der Ohmschen Kontakte. Das Schema der Metallstapel ist in Abb. 10 dargestellt. Beachten Sie, dass dieser Ansatz derzeit für GaN-basierte Leistungsbauelemente entwickelt wird [66,67,68,69].
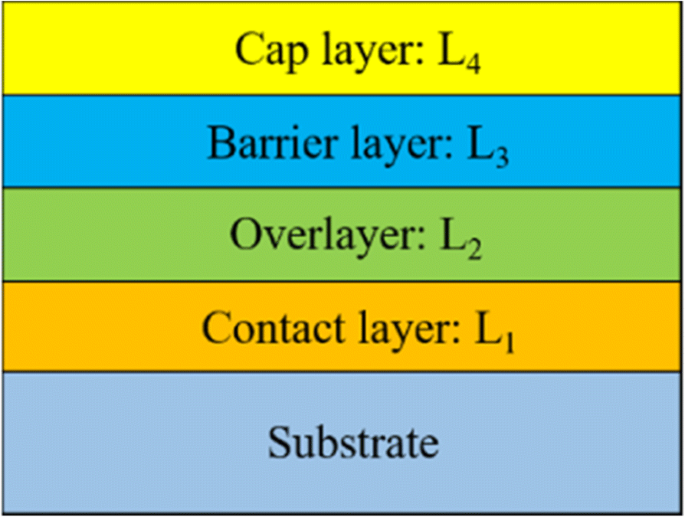
Das Schema von Metallstapeln zum Erhalten ohmscher Kontakte zu Halbleitern mit großer Bandlücke
Die als Kontaktschicht bezeichnete erste Metallschicht auf dem Substrat soll eine geringe Austrittsarbeit und eine gute Haftung zum Substrat aufweisen. Darüber hinaus kann es auch die Diffusion von Metallen der oberen Schicht mit großen Austrittsarbeiten in das Substrat blockieren. Derzeit ist Ti das Hauptmetall als Kontaktschicht zu β-Ga2 O3 wegen seiner geringen Funktion (4,33 eV) und guter Haftung auf dem Untergrund. Außerdem wird die Bildung von Ti2 O3 und Ti3 O5 mit niedrigerer Austrittsarbeit als Ti an der Grenzfläche wird bei der Bildung ohmscher Kontakte bevorzugt, da die Oxide die SBH reduzieren und Sauerstoffleerstellen hinterlassen, die als Donatoren wirken. Andere Metalle mit niedriger Austrittsarbeit wie Ta (3,1 eV) und Hf (3,9 eV) wurden jedoch noch nicht untersucht. Die zweite Deckschicht mit niedriger Austrittsarbeit sollte in der Lage sein, intermetallische Verbindungen mit der Kontaktschicht zu bilden, um deren Diffusion in die Grenzfläche zu verhindern. Gegenwärtig wird Al als Deckschicht verwendet, da es diese Anforderungen erfüllen kann. Die dritte Metallschicht (Barriereschicht) dient der Begrenzung der Eindiffusion der oberen Metallschicht und der Ausdiffusion der unteren Metallschichten [70, 71]. Ni ist die am häufigsten verwendete Barriereschicht für β-Ga2 O3 . Es gibt andere gute Kandidaten wie Mo, Nb und Ir mit hohen Schmelzpunkten, um Ni zu ersetzen, von denen erwartet wird, dass sie eine geringere Reaktivität und Löslichkeit für Au als Ni aufweisen [72,73,74,75]. Die vierte Deckschicht dient als Schutzschicht, um die Oxidation darunterliegender Metalle zu verhindern oder zu minimieren. In der Praxis wird zu diesem Zweck üblicherweise Au verwendet.
Einführung einer Zwischenschicht
Es gibt hauptsächlich zwei Verfahren zum Einbringen einer Zwischenschicht am Metall/β-Ga2 O3 Schnittstelle. Eine besteht darin, eine Halbleiterzwischenschicht (ISL) mit niedriger Austrittsarbeit durch Tempern zu bilden, z. B. Ti2 O3 . Die andere besteht darin, das abgeschiedene ISL zwischen dem Metall und β-Ga2 . einzufügen O3 , die intensiv untersucht wurde [76,77,78]. Im Vergleich zu ersterem Verfahren ist letzteres aufgrund der hohen Ladungsträgerkonzentration von ISL günstiger, um ohmsche Kontakte zu bilden. Die Bandlücken von ISLs reichen von 3,5 bis 4,0 eV [79,80,81], wie AZO (~ 3,2 eV) [82], In2 O3 (~ 2,9 eV) [83, 84] und IGZO (~ 3,5 eV) [85]. Typischerweise werden die SBHs verschiedener Metalle auf β-Ga2 O3 liegen im Bereich von 0,95–1,47 eV [86, 87], wie in Abb. 11a gezeigt. Nichtsdestotrotz reduziert der Einbau einer dünnen ISL die SBH, was den Elektronentransport vom Metall in das Leitungsband von β-Ga2 . erleichtert O3 , wie in Abb. 11b dargestellt. Darüber hinaus könnte die hohe Elektronendichte in ISL den Kontaktwiderstand weiter reduzieren.
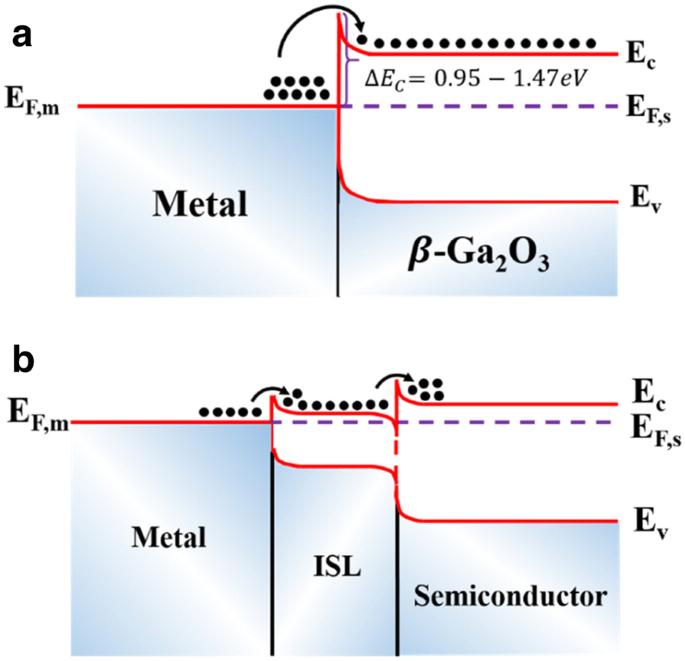
Das Schema der Bandversätze für a Metall/β-Ga2 O3 und b Metall/ISL/β-Ga2 O3 . ∆E c gleich der Energiedifferenz zwischen der Fermi-Energie von Metallen und dem Leitungsband von Halbleitern
In letzter Zeit wurde AZO/Ti/Au als Elektroden auf Si + . verwendet -implantiertes β-Ga2 O3 , und der erhaltene spezifische Kontaktwiderstand betrug 2,82 × 10 –5 Ω∙cm 2 nach dem Tempern [76]. Oshimaet al. erreicht Platin/Indium-Zinnoxid (Pt/ITO) Ohmsche Kontakte zu β-Ga2 O3 mit einem breiten Prozesstemperaturfenster [77]. Das große Prozessfenster von 900–1150 ° C ermöglicht die Realisierung eines Hochtemperaturbetriebs. Und ITO/Ti/Au-Elektroden auf β-Ga2 O3 wurden auch von Carey et al. [78] bei dem die Probe ohmsches Verhalten mit ρ . zeigte C von 6,3 × 10 − 5 Ω∙cm 2 nach dem Glühen. Ohne das ITO lieferte das gleiche Glühen keine linearen Strom-Spannungs-Kennlinien. Diese Ergebnisse bestätigen die Wirksamkeit des Hinzufügens von ISL zum Erhalten ohmscher Kontakte.
Bemerkenswerterweise wurde eine Blase auf der Oberfläche von ITO/Ti/Au-Kontakten beobachtet, während auf der einzelnen ITO-Schicht ohne Metallschicht darüber keine Blasenbildung beobachtet wurde [78]. Es wurde als Ergebnis der Ausdiffusion von Sauerstoffatomen aus der ITO-Schicht in die oberen Metallschichten angesehen. Daher ist es notwendig, geeignete Metall- oder Metallstapel als Deckschichten auf ITO auszuwählen, um eine Verschlechterung der Oberflächenmorphologie zu verhindern.
Schlussfolgerungen
In dieser Arbeit haben wir die bedeutenden Fortschritte in der Forschung und Entwicklung von β-Ga2 . zusammengefasst O3 MOSFETs. Trotzdem sind die Kontakte auf β-Ga2 O3 sind eines der Hauptprobleme, die seine potenzielle Anwendung als Hochfrequenz- und Hochspannungsgeräte in der Zukunft einschränken. Obwohl dieser Aufsatz einen Überblick über den Stand der Technik zur Herstellung ohmscher Kontakte bietet, bleibt noch viel Raum zu erforschen, und eine Reihe von prägnanten Ausblicken kann wie folgt zusammengefasst werden:(i) Die Temperaturabhängigkeit und Abbaumechanismus der Kontakteigenschaften bedürfen weiterer Untersuchungen zur eindeutigen Klärung; (ii) Metalle mit niedriger Austrittsarbeit wie Ta und Hf und Metalle mit hohem Schmelzpunkt wie Mo, Nb und Ir sind es wert, gescreent zu werden, um als Kontaktschicht bzw. Sperrschicht zu dienen; (iii) Die optimalen Metallstapel auf β-Ga2 O3 noch nicht vollständig realisiert, und eine umfassende und systematische Untersuchung von Metallstapeln zu β-Ga2 O3 ist zwingend erforderlich, um niederohmige und thermisch stabile Ohmsche Kontakte zu erzielen; und (iv) andere potenzielle ISLs, die aus ZnO, IZO, IGZO usw. bestehen, bleiben ungenutzt, ebenso wie der Einfluss unterschiedlicher Dicken und Anteile der Inhaltsstoffe von ISLs auf die Leistung der Kontakte. Zusammenfassend lässt sich sagen, dass die Studien über ohmsche Kontakte zu β-Ga2 O3 sind noch recht oberflächlich; wir gehen davon aus, dass dieses thema auch in Zukunft zu den fokusthemen gehören wird. Hoffentlich würden die in diesem Aufsatz vorgestellten Ansätze zur Bildung ohmscher Kontakte maßgeblich dazu beitragen, hochleistungsfähiges β-Ga2 . zu erreichen O3 Geräte.
Nanomaterialien
- Wolframkontakte für Elektrogeräte
- Kontaktdesign wechseln
- Digitale Logikfunktionen
- Hersteller treiben weitere Fortschritte beim 3D-NAND-Flash
- Überwachung der Fortschritte bei Medizinprodukten
- Neuere Veröffentlichungen beschreiben die Skalierbarkeit von Kohlenstoffnanoröhren und Durchbrüche bei der Integration
- Die 10 wichtigsten Fortschritte in der Fertigungstechnologie für Verbundwerkstoffe
- Fortschritte und Herausforderungen fluoreszierender Nanomaterialien für die Synthese und biomedizinische Anwendungen
- 5 aktuelle großartige Reads in der IT/OT-Konvergenz
- 5 aktuelle großartige Reads im IIoT



