Stammkontrollierte Rekombination in InGaN/GaN-Mehrfachquantenquellen auf Siliziumsubstraten
Zusammenfassung
Dieses Papier berichtet über die Photolumineszenz-(PL)-Eigenschaften von InGaN/GaN-Lichtemittierenden Dioden mit mehreren Quantenmulden (MQW), die auf Siliziumsubstraten aufgewachsen sind, die mit unterschiedlichen zugspannungskontrollierenden Architekturen entworfen wurden, wie periodischer Si-δ-Dotierung der n-Typ-GaN-Schicht oder Einfügen einer InGaN/AlGaN-Schicht zur Untersuchung des dehnungskontrollierten Rekombinationsmechanismus im System. Die PL-Ergebnisse zeigten, dass Proben mit Zugspannungsfreisetzung bessere PL-Leistungen aufwiesen, da ihre externe Quanteneffizienz auf 17% anstieg, 7-mal größer als die der regulären Proben. Detailanalysen bestätigten, dass sie geringere strahlungslose Rekombinationsraten hatten ((2,5~2,8)×10 −2 s −1 im Vergleich zu (3,6~4,7)× 10 −2 s −1 ), was mit der besseren kristallinen Qualität und dem Fehlen von Versetzungen oder Rissen verbunden war. Darüber hinaus wurde festgestellt, dass ihre Strahlungsrekombinationsraten stabiler und viel höher waren ((5,7~5,8) ×10 −3 s −1 im Vergleich zu [9~7] ×10 −4 s −1 ) bei Raumtemperatur. Dies wurde der Unterdrückung flacher lokalisierter Zustände an MQW-Grenzflächen zugeschrieben, wodurch die tiefen Strahlungslokalisierungszentren innerhalb der InGaN-Schichten die Strahlungsrekombination dominieren.
Hintergrund
Auf Siliziumsubstraten statt auf konventionellem Saphir aufgewachsene InGaN/GaN-Mehrfachquantentopfstrukturen (MQW) haben aufgrund ihrer potenziellen Anwendungen in kostengünstiger Festkörperbeleuchtung, Panel-Displays und Siliziumphotonik zunehmend Aufmerksamkeit auf sich gezogen [1,2,3,4, 5]. Das kritische Hindernis bei der Herstellung eines hochwertigen GaN-Films auf Si ist die Fehlanpassung der thermischen Ausdehnung (56%) zwischen GaN und Si, die zu großen Zugspannungen und Rissen in den gewachsenen GaN-Filmen führte [6,7,8,9]. Weiterhin ist für Leuchtdioden (LEDs) oder Laserdioden (LDs) eine Si-dotierte n-Typ-GaN-Schicht unter MQW-Schichten erforderlich. In diesen Fällen werden zusätzliche Zugspannungen durch Si-Dotierung eingebracht. In den letzten Jahren wurde versucht, diese Schwierigkeiten durch den Einsatz von Zwischenschichten mit geeigneter Druckspannung zum Ausgleich der Zugspannung zu überwinden [10,11,12,13,14, 15,16], Delta-Dotierung zur Spannungsrelaxation [17, 18] oder die gitterangepasste Pufferschichtabscheidung [19, 20]. Nach früheren Arbeiten [17] konnte eine periodische Si-δ-Dotierungsarchitektur der n-Typ-GaN-Schicht eine glattere GaN-Schicht mit höherer kristalliner Qualität und geringerer Rissdichte als bei gleichförmig dotiertem Si-GaN erreichen. Dies wurde auf die Verringerung der Zugspannung zurückgeführt. Es wurden mehrere Arbeiten zur Untersuchung der Oberflächenmorphologie, der Versetzungsdichte und der elektrischen Eigenschaften von kristallinen GaN/Si-δ-dotierenden GaN-Schichten auf Saphir- [21, 22] oder Siliziumsubstraten [23] durchgeführt. Leider untersuchten nur wenige von ihnen direkt die Lumineszenzeigenschaften von InGaN/GaN-MQW-Strukturen auf einer Si--dotierten GaN-Schicht und klärten die Beziehung zwischen der Verbesserung der Lumineszenzeffizienz und der Spannungsfreisetzung, die durch die für das Gerät entscheidenden Verbesserungen der Filmstruktur verursacht wurden Herstellung. Erwähnenswert ist auch, dass die direkte Messung von Dehnungen oder die Beobachtung von Gitterverzerrungen ohne Zerstörung der LED-Proben schwierig ist. Zur Bewertung der inneren Dehnung werden immer indirekte Methoden angewendet. Zum Beispiel wurde mechanischer Druck ausgeübt, um die innere Spannung zu modulieren, was zu Änderungen des piezoelektrischen Felds in MQWs sowie zu den optoelektronischen Leistungen von LED-Bauelementen führte [24,25,26,27]. In jedem dieser Fälle wurden Lumineszenzspektrenmessungen als unverzichtbar für die Untersuchung der belastungsbezogenen Geräteleistung erachtet.
Daher wurden in dieser Arbeit InGaN/GaN-MQW-LED-Strukturen auf kristallinen Siliziumsubstraten abgeschieden. Zum Vergleich wurde entweder gleichförmig mit Si dotiertes GaN oder periodisches Si -dotiertes GaN, das als n-Typ-GaN-Schicht dient, aufgewachsen. Darüber hinaus wurden zwei weitere Kontrollproben auf der Basis von Si-gleichmäßig dotierten n-Typ-GaN-Schichten, eingefügt durch eine dünne Schicht aus AlGaN bzw hat eine kleinere Gitterkonstante als GaN, wodurch Zugspannungen an der Oberfläche teilweise gelöst werden, und die eingefügte InGaN-Schicht wird die Zugspannung im Gegenteil verstärken. Relative Photolumineszenz (PL)-Effizienzen und Rekombinationslebensdauern (Raten) für jede Probe wurden aus temperaturvariierten stationären (SS) PL-Spektren und zeitaufgelösten (TR) PL-Spektren extrahiert und dann systematisch analysiert. Die Ergebnisse zeigten, dass zugspannungsfreigesetzte Proben bessere PL-Leistungen aufwiesen, da sowohl die nichtstrahlende Rekombination im Zusammenhang mit Strukturdefekten unterdrückt wurde als auch die strahlende Rekombination stärker mit tiefen Rekombinationszuständen innerhalb der InGaN-Wellschichten verbunden sind, was zu einer temperaturstabileren strahlenden Rekombination führte .
Methoden
Wie im Schema von Abb. 1 gezeigt, wurde das epitaktische Wachstum von InGaN/GaN-MQWs durch metallorganische chemische Gasphasenabscheidung durchgeführt, über die in früheren Arbeiten [17] berichtet wurde:100 nm AlN-Schicht, 660 nm linear abgestufte AlGaN-Schicht und 200 nm nominell undotierte GaN-Schichten wurden auf dem Si(111)-Substrat als Puffer bei 1060, 1060 bzw. 1020 °C aufgewachsen. Für die Proben S1, S3 und S4 wurde eine 1 μm große, gleichförmig dotierte GaN-Schicht auf dem Puffer mit einer geschätzten Si-Atomkonzentration von etwa 10 18 . abgeschieden cm −3 . Für die Proben S3 und S4 wurde eine 20 nm eingefügte InGaN-Schicht mit In% ~ 10 at% oder eine 20 nm AlGaN eingefügte Schicht mit Al% ~ 20 % nach der n-Si-gleichförmig dotierten GaN-Schicht abgeschieden. Für Probe S2 wurden 20 Perioden von Si-δ-dotierten Ebenen, jeweils gefolgt von 50 nm nominell undotiertem GaN mit einer Gesamtdicke von 1 &mgr;m, anstelle einer gleichmäßig mit Si dotierten GaN-Schicht auf dem Puffer aufgewachsen. Danach wurden auf jeder Probe von S1–S4 6 Perioden von InGaN/GaN-QWs bei 800 °C gezüchtet, wobei die Indiumzusammensetzung etwa 22,0 At% beträgt. Die durchschnittliche Bohrloch-/Barrieredicke wurde auf 2,4 nm/10 nm geschätzt. Danach wurden 220 nm Mg-dotierte p-Typ-GaN-Schichten bei 1020 °C aufgewachsen. Für PL-Spektrentests wurde ein Zolix-750 PL-System mit einem 10 mW, 377 nm gepulsten Laser als Anregungslichtquelle und ein ANDOR-Newton-CCD mit 0,09 nm Auflösung als Fotodetektor verwendet. Bei TRPL-Messungen wurden die PL-Zerfälle mit einem zeitkorrelierten Einzelphotonen-Zählsystem bei 10–300 K aufgezeichnet.
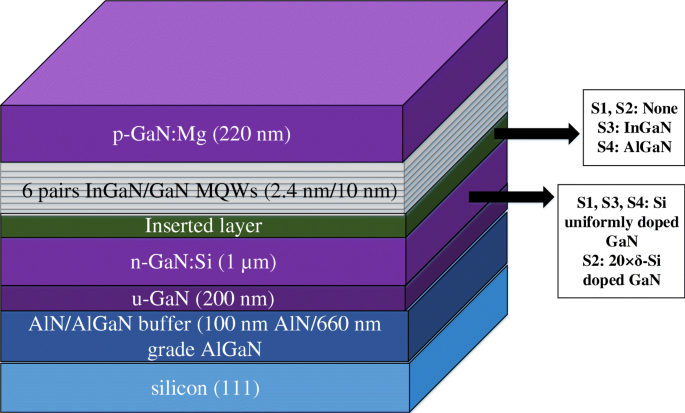
Strukturen der auf Si-Substraten aufgewachsenen MQW-LED-Proben. S1, S3 und S4 enthalten eine 1 μm große, gleichförmig dotierte n-Typ-GaN-Schicht. S3 enthält eine eingefügte 20 nm-InGaN-Schicht. S4 enthält eine 20 nm große AlGaN-Einfügungsschicht. S2 enthält 20 Perioden von Si-δ-dotierten Ebenen, jeweils gefolgt von 50 nm nominell undotiertem GaN mit einer Gesamtdicke von 1 μm anstelle einer mit Si einheitlich dotierten n-Typ-GaN-Schicht
Ergebnisse und Diskussion
Die Übersicht über die SSPL-Eigenschaften für jede getestete MQW-Probe bei 10 K ist in Abb. 2 dargestellt. Wie in der Einfügung zu sehen ist, weist die ursprüngliche MQW auf Si-strukturiertem S1 Emissionspeaks um 500–650 nm mit Fabry-Perot-Oszillation auf. PL-Spektren für alle vier Proben haben den gleichen Charakter. Dieses Phänomen wird häufig bei auf Si-Substraten aufgewachsenen GaN-basierten LEDs beobachtet [28,29,30], da die Puffer/Si-Grenzfläche ein großes Reflexionsvermögen aufweist, sodass ein bemerkenswerter nach unten gerichteter Anteil der PL-Intensität von MQWs reflektiert wird und die direkt nach oben gerichtete Fraktion. Diese Oszillationsspitzen können einfach als Gaußsche PL-Signale multipliziert mit dem Oszillationselement (1 + Acos (4πnd /λ )) (dargestellt als rote Kurve in der Einfügung von Abb. 1), in der A repräsentiert die Schwingungsstärke, n ist der durchschnittliche Brechungsindex des MQW-Films, d ist die gesamte Dicke des MQW-Films und λ ist die PL-Wellenlänge. Gemäß dem obigen Modell kann der ursprüngliche Gaußsche PL-Peak angepasst und aus den komplexen Oszillationspeaks extrahiert werden (gezeigt als blaue Kurve in der Einfügung von Abb. 1). Das SSPL-Ergebnis zeigte, dass S1 einen scharfen grünen PL-Peak bei 531 nm hat, entsprechend der Bandlückenenergie des InGaN-Kristalls mit In%~22at%. Zum Vergleich:S2 mit Si-δ-dotierter n-Typ-GaN-Schicht hat einen bemerkenswert rotverschobenen PL-Peak bei 579 nm, S3 mit InGaN-Einfügungsschicht hat einen leicht blauverschobenen PL-Peak bei 517 nm und S4 mit AlGaN-Einfügungsschicht hat einen leicht rotverschobenen PL Spitze bei 545 nm. Wenn man bedenkt, dass die AlGaN-Insertschicht die Rolle des Abbaus der Zugspannung spielt, die gerade mit der Funktion der Si-δ-Dotierung vertraut ist, während die InGaN-Insertschicht die Zugspannung verstärkt, zeigen diese Ergebnisse, dass die Zugspannung auf dem Substrat zu einer Blauverschiebung der MQW PL-Position führt oder Vergrößerung der durchschnittlichen Bandlücke von InGaN-Well. Der Spannungsfreisetzungseffekt der Si-δ-dotierten GaN-Schicht ist viel stärker als der der Einführung einer eingefügten Schicht.
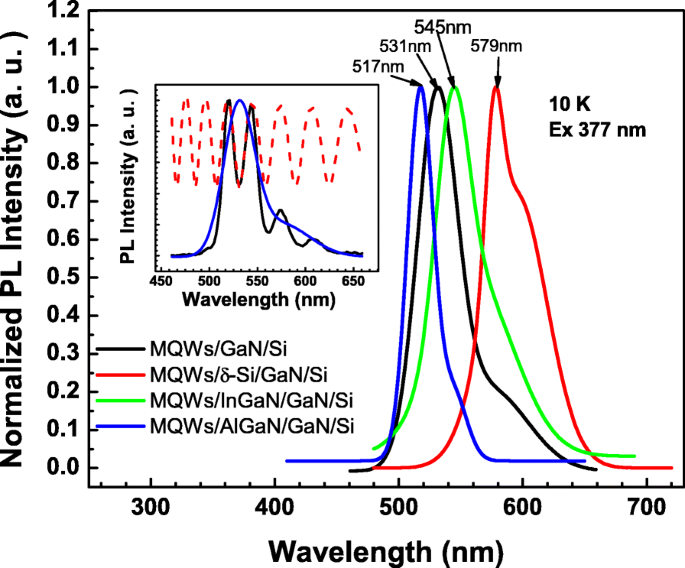
Übersicht über SSPL für S1–S4, angeregt durch einen 377 nm-Laser bei 10 K. Die ursprünglichen PL-Signale enthalten eine Fabry-Perot-Oszillation, die als schwarze Kurve im Einschub dargestellt ist (S1 als Beispiel). Das Oszillationselement (rote gestrichelte Kurve) und der Gaußsche PL-Peak (blaue Kurve) werden durch Anpassen der Originalsignale aufgeteilt. Alle PL-Daten für S1–S4 werden nach der gleichen Methode behandelt, und dann wird die geteilte Gaußsche PL in der Abbildung gezeigt
Um die Rekombinationsnatur in MQWs zu verstehen, ist es wichtig, ihre PL-Zerfallseigenschaften zu testen, da PL-Lebensdauern in Bezug auf strahlende/nicht strahlende Rekombinationsraten direkt aus den Zerfallskurven extrahiert werden können. Hier wurden die PL-Zerfälle gemessen, indem die erfasste Wellenlänge auf Spitzenwerte von S1–S4 fixiert wurde, und die Messungen wurden bei verschiedenen Temperaturen im Bereich von 10 bis 300 K durchgeführt. Abbildung 3 zeigt drei typische PL-Zerfallskurven für S1, getestet bei 10, 100 , und 300 K. Es wurde festgestellt, dass die PL-Zerfälle für alle S1–S4 dazu neigen, mit der Temperatur zu variieren. Dieses Phänomen spiegelt die Temperaturabhängigkeit sowohl der Strahlungsrekombinationsraten als auch der nichtstrahlenden Rekombinationsraten in den Proben wider. Die folgende einzelne exponentielle Abklingfunktion wurde verwendet, um jede Abklingkurve anzupassen:
$$ I(t)={I}_0{e}^{-t/\tau } $$ (1)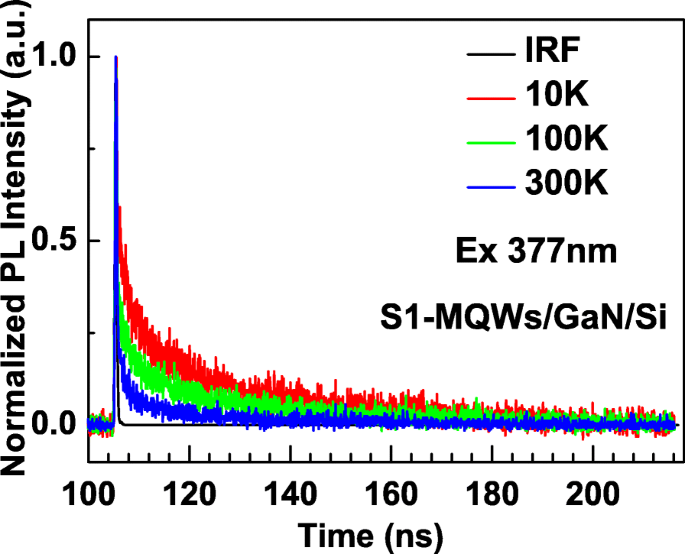
PL-Abklingkurven für S1, angeregt durch gepulsten 377-nm-Laser bei 10 K, 100 K und 300 K
wo ich 0 repräsentiert die PL-Intensität bei t = 0 und τ repräsentiert die PL-Lebensdauer. Es ist erwähnenswert, dass nicht alle Zerfallskurven durch die obige einzelne exponentielle Zerfallsfunktion perfekt angepasst werden können. Dies wurde von mehreren Gruppen ausführlich diskutiert [31,32,33,34]. Eine vernünftige Annahme war, dass im System mehrere Rekombinationszentren existieren. Manchmal wurde eine multiexponentielle Abklingfunktion verwendet, um die Kurven anzupassen. Um zu vermeiden, dass zu viele Annahmen eingeführt werden, die zuletzt schwer zu überprüfen sind, oder dass die Analyse nur die kleineren Teile der gesamten PL-Eigenschaften falsch widerspiegelt, haben wir das einfachste Modell verwendet, um eine durchschnittliche PL-Lebensdauer für jede Probe zu extrahieren kann die gesamten dynamischen PL-Eigenschaften widerspiegeln. Die erhaltenen Lebensdauern für S1–S4 sind in Abb. 4a zusammengestellt. Um die dynamischen PL-Ergebnisse mit der Rekombinationswahrscheinlichkeit zu verbinden, Rekombinationsrate k wurde definiert als k = 1/τ . Flecken von k gegen die Temperatur für S1–S4 sind auch in Abb. 4b gezeigt. Die Ergebnisse zeigen deutlich zwei verschiedene Arten der Evolution von k mit der Temperatur, dass die Rekombinationsraten für die zugspannungsfreigegebenen Proben S2 und S4 über den gesamten Temperaturbereich kleiner sind als die für die ursprüngliche Probe S1 oder die zugspannungsverstärkte Probe S3 und mit steigender Temperatur stärker ansteigen. Beachten Sie, dass k = k r + k Nr , in dem k r repräsentiert die Strahlungsrekombinationsrate und k Nr repräsentiert die nichtstrahlende Rekombinationsrate. Es wird erwartet, dass k Nr steigt mit steigender Temperatur und dominiert k bei Raumtemperatur, da es sich immer um Energieaustauschprozesse mit Wärme handelt [35]. Also, die k Die Ergebnisse auf der Hochtemperaturseite in Abb. 4b zeigen den soliden Beweis dafür, dass Spannungsfreisetzungsprozesse wie Si--Dotierung und AlGaN-Insertion einen positiven Einfluss auf die Unterdrückung der strahlungslosen Rekombination in MQWs durch die Reduzierung von Versetzungsdefekten oder Rissen haben, die einen großen Einfluss auf k . haben Nr . Aber k r wird bei niedriger Temperatur nicht vernachlässigbar. Daher sind zusätzliche Informationen und weitere Analysen erforderlich, um das Verhalten von k . zu erklären auf der Niedertemperaturseite.

a PL-Lebensdauer vs. Temperatur für S1–S4. Die erfasste Wellenlänge wird gemäß den SSPL-Ergebnissen in Abb. 2 an jeder Spitzenposition gehalten. b Entsprechende Rekombinationsraten für S1–S4, erhalten durch k = 1/τ
Daher zum Aufteilen von k r und k Nr von jedem k -Wert wurden SSPL-Spektren bei verschiedenen Temperaturbedingungen für jede Probe gemessen. Dann wurde die Intensität jedes PL-Peaks entsprechend der bei früheren TRPL-Tests erkannten Wellenlängen als I . aufgezeichnet (T ). Danach wurde die relative PL-Effizienz als η . definiert = Ich (T )/Ich 0 , in dem ich 0 stellt die PL-Intensität bei 0 K dar. Die erhaltenen PL-Wirkungen für S1–S4 wurden in Abb. 5a zusammengestellt. Es kann festgestellt werden, dass die PL-Wirkungsgrade für S2 und S4 beide etwa 17% betragen, was 7-mal größer ist als die von S1. Es ist bekannt, dass nur die strahlende Rekombination zur PL-Intensität beiträgt; daher spiegelt diese relative PL-Effizienz das Verhältnis der Strahlungsrekombinationsrate zur Gesamtrekombinationsrate wider:
$$ \eta ={k}_r/\left({k}_r+{k}_{nr}\right)={k}_r/k $$ (2)
a Relativer PL-Wirkungsgrad gegenüber der Temperatur für S1–S4. Die erfasste Wellenlänge wird gemäß den SSPL-Ergebnissen in Abb. 2 an jeder Spitzenposition gehalten. b Gesamtrekombinationsrate, Strahlungsrekombinationsrate und Nichtstrahlungsrekombinationsrate vs. Temperatur für S1
Somit ist es in der Lage, k . aufzulösen r = kη und k Nr = k (1 − η ) aus den TRPL-Ergebnissen kombiniert mit η . Die jeweilige Berechnung für k r und k Nr von S2 wurde in Abb. 5b als Beispiel gezeigt. Die Ergebnisse zeigten, dass selbst für S2 mit Si-δ-Dotierungsmodifikation die nichtstrahlende Rekombinationsrate größer ist als die strahlende Rekombinationsrate, bis eine sehr niedrige Temperatur von 50 K erreicht wird. Dies erklärt den Grund, warum k steigt weiter, wenn die Temperatur steigt, weil sie in k . dominant ist Nr . Es zeigt auch den hohen Bedarf an weiterer kristalliner Qualitätsverbesserung für MQW auf Si-Strukturen. Die Strahlungsrekombinationsrate k r wurde festgestellt, dass sie mit steigender Temperatur monoton abnimmt, was nicht mit den typischen PL-Eigenschaften übereinstimmt, die aus der Rekombination von freien Elektron-Loch-Paaren stammen, die k r ist temperaturfrei. Es ist jedoch sinnvoll, wenn der PL-Prozess bei der Exzitonenlokalisierung dominant ist. Exzitonen neigen dazu, im höheren Temperaturbereich zu delokalisieren; Infolgedessen führt eine Temperaturerhöhung zu einer Abnahme der Lokalisierungsrate [32]. k Nr und k r gegen die Temperatur für S1–S4 sind in Abb. 6a bzw. b zusammengefasst. Wie gezeigt, sind die Ergebnisse von k Nr bei 300 K für S2 und S4 sind 2,5 × 10 –2 s −1 und 2,8 ×10 −2 s −1 , die niedriger sind als die für S1 (3,6 ×10 –2 s −1 ) und S4 (4,7 ×10 −2 s −1 ). Diese belegen weiter, dass Dehnungsfreisetzungsprozesse die Bildung von Versetzungen und Rissen in MQWs unterdrücken und folglich die Dichten nichtstrahlender Rekombinationszentren verringern. Dieser Unterdrückungseffekt wird empfindlicher, wenn die Temperatur sinkt. Das erhaltene k r die Ergebnisse sind komplizierter. Wie gezeigt, k r für S1 und S3 fallen nach Temperaturerhöhung viel stärker ab als für S2 und S4. Als Ergebnis erhalten Sie k r bei 300 K für S2 (5,7 × 10 –3 .) s −1 ) und S4 (5,8 ×10 −3 s −1 ) sind viel höher als für S1 (9×10 −4 s −1 ) und S3 (7 ×10 −4 s −1 ). Es ist vernünftig, dieses Phänomen den Dehnungsfreisetzungsprozessen zuzuschreiben:Gemäß der obigen Diskussion hängen die Strahlungsprozesse in diesen MQW-Proben hauptsächlich mit der Exzitonenrekombination in lokalisierten Zuständen zusammen. Hier, k r wird hauptsächlich durch die Exzitonenlokalisierungsrate k . bestimmt loc . Der dramatische Rückgang von k loc mit steigender Temperatur weist darauf hin, dass die durchschnittliche Tiefe der lokalisierten Zustände im System relativ gering ist, wodurch das Exziton bei hoher Temperatur leicht delokalisiert werden kann. Mit anderen Worten, die durchschnittlichen Tiefen der lokalisierten Zustände in Proben mit Dehnungsfreisetzung wie S1 und S3 sind kleiner als die ohne Dehnungsfreisetzung. Basierend auf früheren Arbeiten [36] werden die lokalisierten Strahlungsrekombinationszentren in InGaN/GaN-MQWs oft durch strukturelle Defekte in InGaN-Wannenschichten angeboten, wie Variationen der Wannendicke und indiumreiche Cluster, in denen Variationen der Wannendicke flache Zustände sowie indiumreiche Cluster bieten Zustände mit viel tieferen Tiefen [33]. Hier das Ergebnis von k r weist darauf hin, dass eine starke Zugspannung an MQW-Grenzflächen, die durch das Si-Substrat und Si-dotiertes GaN geführt wird, die Bildung von strahlenden flachen Strukturdefekten verbessern kann, so dass die Tiefe der lokalisierten Zustände für S1 und S3 geringer ist und auch Dickenvariationen bei den Exzitonen-Lokalisierungsprozessen dominant sind . Für S2 und S4 werden die Schwankungen der Topfdicke unterdrückt, sodass die Exzitonen-Lokalisierungsprozesse in den tiefen Zuständen innerhalb von InGaN-Wells dominant sind und viel größere durchschnittliche Tiefen der lokalisierten Zustände und ein stabileres k . aufweisen r gegen Temperatur. Folglich zeigen die Proben S1 und S3 ein höheres k r als S2 und S4 auf der Niedertemperaturseite, wo der Exzitonen-Delokalisierungseffekt schwach ist, aber viel kleiner k r bei Raumtemperatur.

a Strahlungsfreie Rekombinationsraten vs. Temperatur für S1–S4. b Strahlungsrekombinationsraten vs. Temperatur für S1–S4
Schlussfolgerungen
Zusammenfassend wurden temperaturvariable SSPL- und TRPL-Spektren für verschiedene InGaN/GaN-MQWs auf Si-Strukturen mit oder ohne Zugspannungsabbaubehandlungen untersucht. Es wurde festgestellt, dass die Probe mit Si--dotierter GaN-Schicht oder AlGaN-Einfügungsschicht eine geringere Rekombinationsrate und eine höhere PL-Effizienz (bis zu 17%) aufwies als die reguläre Probe (2,5%) oder Probe mit InGaN-Einfügungsschicht (1,6%). Eine weitere Analyse stellte klar, dass die kleineren Rekombinationsraten hauptsächlich von kleineren dominanten nichtstrahlenden Rekombinationsraten (2,5 ×10 −2 s −1 für δ-Dotierungsprobe 3,6 ×10 –2 s −1 für Probe mit eingebrachtem AlGaN im Vergleich zu 3,6 ×10 −2 s −1 für normale Stichprobe und 4,7 ×10 −2 s −1 für InGaN eingefügte Probe), die auf die Unterdrückung der Bildung von Versetzungen oder Rissen zurückzuführen waren. Neben den geringeren strahlungslosen Rekombinationsraten wurden die besseren PL-Leistungen auch von den strahlenden Rekombinationsraten angeführt, die bei Raumtemperatur stabiler und höher waren (5,7 ×10 −3 s −1 für δ-Dotierungsprobe, 5,8 ×10 –3 s −1 für Probe mit eingebrachtem AlGaN im Vergleich zu 9 ×10 –4 s −1 für normale Stichprobe und 7 ×10 −4 s −1 für inGaN eingefügte Probe). Sie waren auch auf die Unterdrückung von Dickenvariationen an MQW-Grenzflächen zurückzuführen, wodurch die tiefen Strahlungslokalisierungszentren innerhalb der InGaN-Schichten den Strahlungsrekombinationsprozess dominieren. Die obigen Ergebnisse zeigten ein klares Bild der Rekombinationsprozesse von InGaN/GaN-MQW-LED-Bauelementen auf Siliziumsubstraten, die die Herstellung von Bauelementen in der Zukunft leiten können.
Abkürzungen
- IQE:
-
Interne Quanteneffizienz
- LD:
-
Laserdiode
- LED:
-
Leuchtdiode
- MQW:
-
Mehrfachquantentopf
- PL:
-
Photolumineszenz
- SSPL:
-
Stationäre Photolumineszenz
- TRPL:
-
Zeitaufgelöste Photolumineszenz
Nanomaterialien
- Quantum Transport wird ballistisch
- Einzelatom-Qubits unter dem Mikroskop aufbauen
- Nanosilizium zur Herstellung von Wasserstoff
- Nanobeschichtung für mehrere Farben
- Nanographem, flexibler transparenter Speicher auf Siliziumbasis
- Die atomare Umlagerung von GaN-basierten mehreren Quantenquellen in H2/NH3-Mischgas zur Verbesserung der strukturellen und optischen Eigenschaften
- Mehrfarbige Emission von ultravioletter GaN-basierter photonischer Quasikristall-Nanopyramidenstruktur mit semipolaren InxGa1−xN/GaN-Mehrfachquantenquellen
- Gleitgeschwindigkeitsabhängiger tribochemischer Verschleiß von oxidfreiem Silizium
- Wismut-Quantenpunkte in geglühten GaAsBi/AlAs-Quantenbrunnen
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie



