Wismut-Quantenpunkte in geglühten GaAsBi/AlAs-Quantenbrunnen
Zusammenfassung
Es wird über die Bildung von Wismut-Nanokristallen in GaAsBi-Schichten berichtet, die durch Molekularstrahlepitaxie bei einer Substrattemperatur von 330 °C und nach dem Wachstum bei 750 °C getempert wurden. Übergitter mit abwechselnden 10 nm dicken GaAsBi- und AlAs-Schichten wurden auf einem halbisolierenden GaAs-Substrat aufgewachsen. AlAs-Schichten dienten als Diffusionsbarrieren für Bi-Atome, und die Größe der Nanocluster, die nach dem Tempern der Probe nukleierten, korrelierte mit der Dicke der Bismidschichten. Energiedispersive Spektroskopie und Raman-Streuungsmessungen haben gezeigt, dass die Nanopartikel überwiegend aus Bi-Atomen bestehen. Nach dem Tempern wurde ein starkes Photolumineszenzsignal mit Photonenwellenlängen im Bereich von 1,3 bis 1,7 μm beobachtet; seine Amplitude vergrößerte sich mit der erhöhten Anzahl der GaAsBi-Schichten. Die beobachtete Photolumineszenzbande kann auf die Emission von Bi-Nanokristallen zurückzuführen sein. Die durchgeführten theoretischen Schätzungen stützen die Annahme. Sie zeigen, dass die Bi-Nanopartikel aufgrund des Quantengrößeneffekts einen Übergang in den halbleitenden Zustand mit direkter Bandlücke erfahren.
Hintergrund
GaAsBi-basierte Heterostrukturen haben ein großes Potenzial für optoelektronische Anwendungen in einem breiten Spektralbereich, der vom nahen bis mittleren Infrarotbereich reicht. GaAsBi ist eine Halbleiterverbindung der Gruppe III–V, die aktiv für GaAs-basierte Infrarotstrahlungsemitter [1] und Detektoren [2,3,4,5] untersucht wird. Leuchtdioden mit aktiven GaAsBi-Schichten, die bei Wellenlängen von ~987 nm (bei einem Bi-Gehalt von 1,8 %) strahlen, wurden von Lewis et al. [6]; über den elektrisch injizierten Bismidlaser mit ~6% Bi in einem GaAsBi/GaAs-Multiquantentopf (MQW) wurde in Lit. berichtet. [7]. Die Hauptschwierigkeit auf diesem Gebiet ist eine Erhöhung der Dichte der nichtstrahlenden Rekombinationszentren aufgrund der niedrigen Substrattemperaturen, die für ein Molekularstrahlepitaxie-(MBE)-Wachstum von GaAsBi-Schichten mit einem Bi-Gehalt über 5% erforderlich sind. Eines der standardmäßigen technologischen Verfahren, die eine Reduzierung der nicht-strahlenden Rekombinationsrate ermöglichen, ist ein Tempern nach dem Wachstum bei Temperaturen, die höher sind als die für das MBE-Wachstum verwendeten. Im Fall von GaAsBi ist der Effekt des Glühens jedoch nicht eindeutig. Unsere Gruppe hat zuvor gezeigt [8, 9], dass das Ausheilen bei Temperaturen über 600 °C zu mehreren neuen Merkmalen führt, von denen das nicht trivialste ein Einsetzen in einigen der Proben relativ intensiver Photolumineszenz (PL) ist. im Wellenlängenbereich von 1,35 bis 1,5 μm, wobei dieser Prozess von erheblichen Veränderungen der GaAsBi-Epitaxieschicht begleitet wird – einer Verringerung des Bi-Gehalts im kristallinen Gitter und dem Auftreten von Clustern im Nanometerbereich [9].
Das Wachstum von Nanostrukturen – Nanodrähte, verspannte Quantentöpfe oder Quantenpunkte (QDs) – ist eine beliebte Methode, um die Gitterfehlanpassung zwischen einem Substrat und der darauf aufgewachsenen Epitaxieschicht zu vermeiden. Die am häufigsten untersuchten Beispiele für QDs auf der Basis von III-V-Verbindungen sind die auf InGaAs- [10] und InGaN- [11] basierenden QDs, die mit der Stranski-Krastanow-Technik [12] gezüchtet wurden. Im Fall von GaAsBi ist ein solcher Wachstumsmechanismus noch nicht realisiert. Die Nukleation von Bi-bezogenen Clustern in getemperten epitaktischen GaAsBi-Schichten und ihre strukturellen Eigenschaften wurden in Lit. systematisch untersucht. [13]. Es wurde gezeigt, dass Nanocluster unterschiedlicher kristalliner Strukturen und Zusammensetzungen – rhomboedrische As und Bi sowie Zinkblende-GaAsBi-Nanocluster – beim Tempern in den Bismidschichten Keime bilden; ihre Größe variiert zwischen 5 und 20 nm. Rhomboedrische Cluster aus reinem Wismut wurden in GaAsBi mit relativ hohem Bi-Gehalt (4,7%) beobachtet, das bei niedriger Temperatur (200 °C) gewachsen war [13]. In unserer vorherigen Studie [9] wurde eine Bildung nanometergroßer Bi-Cluster im hochtemperaturgeglühten GaAsBi mit einem Bi-Gehalt von über 6% berichtet. Darüber hinaus wurde angenommen, dass die Wismut-Nanocluster aufgrund der Größenquantisierungseffekte eher halbleitend als halbmetallisch werden (wie es bei den massiven Bi-Kristallen der Fall ist) und dass die strahlende Rekombination in Bi-Clustern verantwortlich für die langwellige Emission, die in getemperten GaAsBi-Proben beobachtet wurde [9].
Die vorliegende Arbeit berichtet über eine Bildung von Bi-Nanokristallen in getemperten GaAsBi/AlAs-Quantentöpfen. Die AlAs-Schichten dienten als Barrieren sowohl für einen Ladungsträgereinschluss als auch zum Verhindern einer Bi-Ausdiffusion aus GaAsBi-Schichten während eines Tempervorgangs. Das Vorhandensein von AlAs-Schichten hat eine kontrolliertere Nukleation von Bi-Nanopartikeln sichergestellt – ihre Größenverteilung war enger und ihre Dichte war höher als in getemperten Volumenschichten [9]. Die erhaltenen Proben wurden durch hochauflösende Transmissionselektronenmikroskopie (HRTEM), PL- und Raman-Spektroskopie-Messungen charakterisiert. Die Ergebnisse dieser Experimente weisen auf das Vorhandensein reiner Bi-Nanokristalle in den getemperten Heterostrukturen hin. Die durchgeführten theoretischen Schätzungen bestätigen, dass Bi-Nanokristalle durch die Größenquantisierungseffekte in Halbleiter mit direkter Gap umgewandelt werden können.
Methoden
GaAsBi/AlAs-MQW-Strukturen wurden auf halbisolierenden GaAs (100)-Substraten unter Verwendung eines SVT-A-MBE-Reaktors mit metallischen Ga-, Al- und Bi-Quellen sowie einer Zweizonen-Cracker-Quelle zur Herstellung von As2 . Das folgende MBE-Wachstumsschema wurde verwendet. Zuerst wurden die GaAs-Pufferschicht (von etwa 100 nm) und die erste AlAs-Barriere unter Verwendung des Standard-MBE-Wachstumsmodus bei der hohen Temperatur von 600 °C gezüchtet. Dann wurde das Wachstum unterbrochen und die Substrattemperatur wurde für ein Wachstum von GaAsBi-QWs und AlAs-Barrieren gesenkt. Der migrationsverstärkte Epitaxiemodus (MEE) wurde für die AlAs-Abscheidung in der folgenden Wachstumssequenz verwendet:eine Monoschicht (ML) von Al, 5 s lange Unterbrechung für eine Migration von Atomen der Gruppe III, dann eine Zufuhr von 1 ml As [14, 15 ]. Schließlich wurde die MQW-Struktur mit einer 5 nm dicken GaAs-Deckschicht bedeckt. Der Bi-Gehalt in GaAsBi-Schichten wurde aus dem (200)-Reflex des ω-2Θ-XRD-Scans bestimmt und betrug etwa 7% für die gewachsenen Proben.
Für die Messungen wurden zwei verschiedene MQW-Proben ausgewählt. Die MQW A-Probe enthält drei 10 nm dicke und ein 20 nm dicke GaAsBi-QWs (MBE-gewachsen bei 330 °C), getrennt durch 20 nm dicke AlAs-Barrieren (MEE-gewachsen bei der gleichen Temperatur). Die MQW-B-Probe enthält 20 QWs mit 10 nm breiten GaAsBi-Schichten, die durch 4 nm dicke AlAs-Barrieren getrennt sind, die unter ähnlichen Bedingungen wie für das Wachstum der A-Probe verwendet wurden. Die Hochtemperaturbehandlung beider Proben wurde im Rapid Thermal Annealing (RTA)-Ofen bei einer Temperatur von 750 °C für 180 s bei Stickstoffumgebung durchgeführt. Um Arsenverlust aus der Oberflächenschicht zu verhindern, wurden die Proben während des Temperns mit einem GaAs-Opferwafer bedeckt.
Die Rasterkraftmikroskopie-Oberflächenanalyse zeigte tropfenfreie Oberflächen sowohl von gewachsenen als auch getemperten MQW-Strukturen. Die Oberflächenrauhigkeit der GaAs-Deckschicht lag unter 1 nm. Die strukturellen hochauflösenden Messungen von Nanopartikeln, die in MQWs nach dem Tempern der Probe gebildet wurden, wurden von FEI Tecnai G2 F20 X-TWIN TEM mit STEM-Modul durchgeführt, ausgestattet mit einem Röntgenenergiedispersiven Spektroskopie (EDS)-Detektor für elementare Mapping und ein High Angle Annular Dark Field (HAADF)-Detektor für die Z-Kontrast-Bildgebung. Das Zweistrahlmikroskop FEI Helios Nanolab 650 mit einem Omniprobe-Manipulator wurde verwendet, um die Proben für die TEM-Messungen vorzubereiten.
Abbildung 1 zeigt ein STEM-Bild der A-Probe. Das Bild zeigt offensichtlich zahlreiche Nanopartikel, die nach dem Tempern in GaAsBi-Quantentopfschichten (QW) gebildet wurden. Im Bild lässt sich ein offensichtlicher Zusammenhang zwischen der Größe der Nanopartikel und der Breite der QW-Schichten erkennen. Die Korrelation belegt, dass AlAs-Schichten (dunkelste Bereiche) effektiv als Barrieren wirken, die eine Ausdiffusion von Bi-Atomen aus GaAsBi-Schichten verhindern. Die gleichzeitig mit der HAADF-Bildgebung erhaltene EDS-Elementarkartierung ausgewählter Bereiche der Probe zeigt (Abb. 2), dass die gebildeten Nanokristalle überwiegend aus Bismutatomen bestehen.
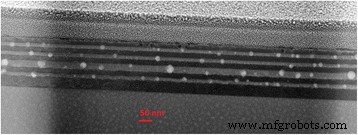
STEM-Bild der A-Probe mit drei 10 nm dicken und einem 20 nm dicken GaAsBi-QWs, die durch MBE gezüchtet wurden, und 20 nm dicken MEE-gewachsenen AlAs-Barrieren nach dem Tempern bei 750 °C für 180 s

HAADF-STEM Z-Kontrastbild von Bi-Nanokristallen in GaAsBi/AlAs-MQW-Strukturen (oben ). Die EDS-Bilder (unten ) stellen die elementare Abbildung der Intensitäten von Ga, Al, Bi und As dar, gemessen auf dem markierten Bereich des STEM-Bildes
Ergebnisse
Raman-Spektroskopie
Die Raman-Spektren der untersuchten GaAsBi-MQW-Proben wurden in der Rückstreugeometrie mit einem Via Raman (Renishaw)-Spektrometer aufgenommen, das mit einer thermoelektrisch gekühlten (–70 °C) CCD-Kamera und einem Mikroskop ausgestattet war. Für eine Photoanregung wurde die 532-nm-Strahlungslinie eines diodengepumpten Festkörperlasers verwendet. Zur Aufnahme der Raman-Spektren wurden das 50×/0,75 NA-Objektiv und das 1800 Linien/mm-Gitter verwendet. Die Akkumulationszeit betrug 400 s. Um eine Beschädigung der Probe zu vermeiden, wurde die Laserleistung an der Probe auf 0,06 mW begrenzt. Die Raman-Frequenzen wurden mit dem Siliziumstandard kalibriert (Linie bei 520,7 cm −1 ). Die Parameter der Schwingungsmoden wurden durch Anpassen der experimentellen Spektren mit Gauß-Lorentz-Formkomponenten unter Verwendung der Software GRAMS/A1 8.0 (Thermo Scientific) bestimmt.
Die Raman-Spektren der gewachsenen und getemperten GaAsBi/AlAs-MQW-A-Probe sind in Abb. 3 dargestellt. Ein intensives Dublett, das in der gewachsenen Probe (Abb. 3, grüne Kurve) bei 269 und 290 cm . beobachtet wurde −1 entspricht den GaAs-ähnlichen transversalen optischen (TO) bzw. longitudinalen optischen (LO) Phononenmoden [16,17,18]. In der Rückstreugeometrie ist das TO-Band für den idealen GaAs-Kristall symmetrisch verboten [17, 18], aber die Bi-induzierte Kristallstrukturstörung bricht die Symmetrie des GaAs-Kristallgitters und aktiviert den TO-Modus. Zwei weitere breite Bi-induzierte Schwingungsmoden, die in der Nähe von 227 und 181 cm −1 . sichtbar sind kann auf GaBi-ähnliche Schwingungsmoden zurückgeführt werden [18]. Das Vorhandensein von AlAs-Barrieren kann im Raman-Spektrum anhand eines scharfen LO-Modus bei 402 cm −1 . erkannt werden [19].
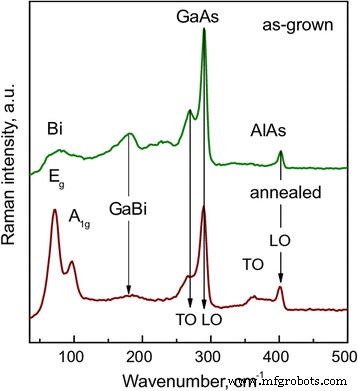
Raman-Spektren des Wachstums (grüne Kurve .) ) und getempert (rote Kurve ) GaAsBi MQW A-Probe
Ein relativ kurzes (180 s) thermisches Tempern der Probe bei 750 °C induziert wesentliche Änderungen im Raman-Spektrum:(i) intensive Niederfrequenzbänder erscheinen bei 72 und 96 cm −1 , (ii) Intensität der Banden in der Nähe von 269, 227 und 181 cm −1 abnimmt und (iii) ein breites Merkmal in der Nähe von 361 cm −1 erscheint im getemperten Probenspektrum. Die beiden Niederfrequenzbänder bei 72 und 96 cm −1 entspricht gut E g und A 1g Moden des kristallinen Wismuts [20,21,22,23,24]. Das Auftreten dieser Banden zusammen mit einer Abnahme der Intensität der Bi-induzierten GaBi-ähnlichen Banden bei 269 und 181 cm −1 zeigt, dass das thermische Tempern das Abziehen von Wismut von den GaAsBi-Gitterplätzen und seine Agglomeration zu Bi-Nanokristallen verursacht. Darüber hinaus beeinflusst die Bildung von Bismut-Nanokristallen auch die kristalline Struktur von AlAs-Schichten, wie aus dem Anstieg eines breiten defektinduzierten TO-Merkmals nahe 361 cm −1 . hervorgeht [25].
Photolumineszenzmessungen
Die temperaturabhängigen Photolumineszenz (PL)-Messungen wurden unter Verwendung eines Monochromators mit 500 mm Brennweite (Andor SR-500i) zusammen mit dem mit flüssigem Stickstoff gekühlten InGaAs-Photodetektor durchgeführt. Als Anregungsquelle wurde ein diodengepumpter Festkörperlaser mit einer Wellenlänge von 532 nm mit einer Anregungsleistung von 38 mW verwendet. Die Proben wurden am Kühlfinger eines Helium-Kryostats mit geschlossenem Kreislauf montiert, der mit einem Temperaturregler gekoppelt war, was Messungen im Temperaturbereich von 3–300 K ermöglichte.
Die bei verschiedenen Temperaturen gemessenen PL-Spektren der getemperten A-Probe, die drei 10 nm dicke und ein 20 nm dickes GaAsBi-QW enthält, sind in Abb. 4a dargestellt. Zwei Hauptgruppen von Spektralmerkmalen unterhalb der Bandlücke von GaAs können unterschieden werden. Ein starker energiereicherer Peak bei etwa 1,35 eV kann auf Strahlungsübergänge in GaAsBi-QWs zurückgeführt werden. Die Position des Peaks liegt nahe der in GaAs beobachteten0,979 Bi0,021 /GaAs-Quantentöpfe [26] und korreliert mit XRD-Daten, die einen Bi-Gehalt von 2,1% in den GaAsBi-QW-Schichten der A-Probe nach dem Tempern anzeigten. Die spektralen Merkmale auf der niederenergetischen Seite, 0.6–1.05 eV, erscheinen in PL-Spektren nach einem thermischen Tempern der Probe und können daher auf optische Übergänge in Bi-Nanokristallen zurückgeführt werden. Das niederenergetische PL-Band hat eine innere Struktur, die sich bei tiefen Temperaturen offenbart. Nämlich bei T = 3 K, können die bei 0,67, 0,88 und 0,98 eV positionierten PL-Komponenten unterschieden werden. Wie aus Abb. 4a ersichtlich, ist das PL-Signal von GaAsBi-QWs bei der Temperatur von flüssigem Helium zwei Größenordnungen stärker als das niederenergetische PL-Band. Der hochenergetische PL-Peak nimmt jedoch mit steigender Temperatur schnell ab und der niederenergetische PL-Peak beginnt bei T . zu dominieren> 100 K.

Temperaturabhängige PL-Spektren des getemperten a A-Probe bestehend aus drei 10 nm breiten und einem 20 nm breiten GaAsBi/AlAs-QW und b B-Probe bestehend aus 20 10 nm breiten GaAsBi/AlAs-QWs
Die PL-Spektren der B-Probe, die zwanzig 10 nm dicke GaAsBi-Quantentöpfe enthält, die durch 4 nm dicke AlAs-Barrieren getrennt sind, sind in Abb. 4b dargestellt. Vor dem thermischen Tempern zeigte die B-Probe, wie dies bei der A-Probe der Fall war, nur das QW-bezogene PL-Band mit höherer Energie. Der starke niederenergetische PL-Peak bei etwa 0,85 eV wurde nach dem thermischen Tempern beobachtet und kann daher der Emission von Bi-Nanokristallen zugeschrieben werden. Die Intensität des niederenergetischen Peaks in der B-Probe ist stärker als die in der A-Probe und skaliert mit einer erhöhten Anzahl von QWs. Bei niedrigen Temperaturen können drei Komponenten des Peaks verfolgt werden, die in der A-Probe gut aufgelöst wurden. In der B-Probe wird der niederenergetische PL-Peak jedoch im gesamten untersuchten Temperaturbereich von seiner 0,85 eV-Komponente dominiert. Die Position des energiereicheren, QW-bezogenen PL-Peaks ist in Bezug auf seine Position in der A-Probe gemäß den XRD-Daten leicht zu niedrigeren Energien verschoben, was auf 2,8% Bi in den Quantentopfschichten der B-Probe nach hinweist seine thermische Glühung. In der B-Probe zeigt der QW-bezogene PL-Peak seine innere Struktur. Der Peak besteht aus der gebundenen exzitonenbezogenen Komponente bei etwa 1,27 eV, die bei niedrigen Temperaturen dominiert, und der delokalisierten exzitonenbezogenen Komponente, die bei etwa 1,35 eV liegt und bei höheren Temperaturen dominiert. Die innere Struktur des QW-bezogenen Peaks führt zu einer charakteristischen S-Typ-Temperaturabhängigkeit der PL-Peakposition (volle Punkte in Abb. 5), die zuvor sowohl in GaAsBi-Volumen [27] als auch in GaAsBi/GaAs-Quantentöpfen beobachtet wurde [26]. Der bei niedrigen Photonenenergien positionierte PL-Peak zeigt eine viel schwächere Temperaturabhängigkeit (offene Punkte und Kurve in Abb. 5), die durch die Varshni-Funktion E . angepasst werden kann (T ) = E (0) − αT 2 /(β + T ) mit den Parametern α und β gleich 10 −4 eV/Grad bzw. 100 K. Es sollte beachtet werden, dass der Wert des α-Parameters, der für die Variation der Energielücke mit der Temperatur verantwortlich ist, viel kleiner ist als seine Standardwerte für die meisten Halbleiter, 3°10 –4 –5°10 −4 eV/Grad. Dies macht die Bi-Nanokristallmatrix zu einem wichtigen potentiellen System für Lichtquellen, die bei Telekommunikationswellenlängen emittieren und eine geringe Temperaturempfindlichkeit aufweisen.

Temperaturabhängigkeiten der Spektralpositionen der hoch- und niederenergetischen PL-Bänder für die getemperte B-Probe bestehend aus zwanzig 10 nm breiten GaAsBi/AlAs-QWs
Diskussion
Die HRTEM-, EDS- und Raman-Spektroskopie-Messungen, die in der vorliegenden Studie durchgeführt wurden, zeigen, dass Bi-Nanokristalle (Quantenpunkte) in GaAsBi-Schichten nach einem thermischen Tempern der durch Niedertemperatur-MBE gewachsenen GaAsBi/AlAs-MQW-Proben ausfallen. Man kann davon ausgehen, dass diese Nanokristalle für die langwellige Photolumineszenzbande verantwortlich sind, die sich in den getemperten Proben zeigt. Obwohl das Bulk-Wismut halbmetallisch ist, führen die kleinen effektiven Massen der Bi-Ladungsträger zu einem frühen Einsetzen von Quanteneinschlusseffekten in Bi-basierten Nanostrukturen. Tatsächlich wurde eine der ersten experimentellen Beobachtungen der Größenquantisierungseffekte für dünne Bi-Schichten berichtet [28]. Halbmetall-Halbleiter-Übergang in dünnen Bi-Filmen, d < 30 nm, wurde experimentell in Lit. beobachtet. [29]. Der Übergang wurde auch bei Bi-Nanodrähten mit Durchmessern kleiner als 65 nm nachgewiesen [30, 31]. In beiden Fällen wurde der halbleitende Zustand durch Messungen der temperaturabhängigen elektrischen Eigenschaften identifiziert. Der Quantengrößeneffekt in Wismut-Nanopartikeln wurde zum ersten Mal durch Elektronenenergieverlustspektroskopie untersucht [32], und es wurde festgestellt, dass der Übergang vom Halbmetall zum Halbleiter in Bi-Nanopartikeln mit Durchmessern unter 40 nm auftritt. Der Übergang in den direkten Halbleiterzustand wurde kürzlich für kolloidale 3,3-nm-Bi-Nanopartikel beschrieben [33].
In reinem Bi befinden sich die Haupttäler von Elektronen und Löchern am L und T Punkte der Brillouin-Zone und entsprechen ellipsoiden isoenergetischen Oberflächen (Tabelle 1). Der Grundzustand der ellipsoidalen Talelektronen (Löcher) in einem kugelförmigen Quantenpunkt kann näherungsweise abgeschätzt werden als
$$ W=\frac{\pi^2{\hslash}^2}{2\overline{m}{r}_0^2}\ . $$ (1)Hier r 0 ist der QD-Radius und \(\overline{m}\) ist die durchschnittliche inverse effektive Masse,
$$ \frac{1}{\overline{m}}=\frac{1}{3}\left(\frac{1}{m_1}+\frac{1}{m_2}+\frac{1}{ m_3}\rechts), $$ (2)m 1 , m 2 , und m 3 sind die wichtigsten effektiven Massen des ellipsoiden Tals.
Die phänomenologische Formel (1) gibt eine genaue Schätzung des Bodenenergieniveaus ε1 in einem unendlich tiefen kugelförmigen QD bei beliebigen Verhältnissen der effektiven Massen. Tatsächlich ist es genau, ε1 = W , bei einer kugelförmigen isoenergetischen Oberfläche (m 1 = m 2 = m 3 ), sagt die ε1 . voraus Energie mit einer Genauigkeit von 12 %, ε1 ≈ 0,88 W , und 25 %, ε1 = 0,75 W , in den Grenzfällen stark gestreckter Sphäroidal (m 1 = m 2 , m 3 → ∞) und stark abgeplatteter kugelförmiger (m 1 = m 2 , m 1 → ∞) bzw. Daher nähert sich Formel (1) bei willkürlichen Werten der effektiven Hauptmassen der QD-Bodenenergie mit einer Genauigkeit von besser als 25 %.
Formel (1) ermöglicht eine einfache und direkte Bewertung der effektiven Energielücken in Bismut-Quantenpunkten, E g,eff = E g + W e + W h , wobei E g ist eine Energielücke in einem Volumenkristall und W e und W h sind die Elektronen- und Lochgrößenquantisierungsenergien (1). Die berechnete effektive T und L Energielücken sind in Abb. 6 grafisch dargestellt. (Die Elektronen- und Lochmassen bei beiden T und L Punkte wurden als gleich angenommen.)

Evolution mit dem Bi-QD-Energiespektrum mit abnehmender Größe (r 0 und d sind der QD-Radius und -Durchmesser)
Im massiven halbmetallischen Wismut ist das Leitungsbandminimum des L Tal liegt 38 meV unter dem T Valenzband maximal. Wenn die Größe der Bi-Partikel verringert wird, wird die effektive Energiebandlücke bei L Punkt steigt schneller als am T Punkt aufgrund kleinerer effektiver Massen des L -Tal, was schließlich zum Übergang vom Halbmetall zum Halbleiter führt (das i -Kreuzungspunkt in Abb. 6). Zunächst wird ein Wismut-Nanokristall der indirekte Halbleiter mit dem niedrigsten Leitungsbandminimum bei L Punkt und das höchste Valenzbandmaximum bei T Punkt. Mit einer weiteren Verringerung der QD-Größe treten sowohl die Valenz- als auch die Leitungsbandkanten am T . auf Punkte, die den Bi-QD zu einem Halbleiter mit direkter Bandlücke machen (der d -Kreuzungspunkt in Abb. 6).
Es sollte beachtet werden, dass Abb. 6 nur ein grobes Schema des Energiespektrums darstellt, da das Schema die Nicht-Parabolizitätseffekte vernachlässigt und die unendlichen Energiebarrieren für QDs annimmt. Eine Abweichung vom parabolischen Dispersionsgesetz ist für das L . wesentlich -Tal (siehe z. B. [34]). Tatsächlich sind die effektiven Massen am L -Talzentrum sind ungefähr fünfmal kleiner als ihre Werte bei der Fermi-Energie (die für die Berechnungen des in Abb. 6 dargestellten Energiespektrums verwendet wurden). Andererseits sind die Nicht-Parabolizitätseffekte beim T . schwächer Punkte, an denen die Energiebandlücke größer ist und daher das dargestellte effektive T Energielücke (Abb. 6) kann als relevante Schätzung angesehen werden.
Oben hatten wir angenommen, dass der niederenergetische PL-Peak bei ~0,85 eV auf die optischen Übergänge zurückzuführen ist, die in Bi-Nanokristallen mit Durchmessern von etwa 10 nm stattfinden. Die vorgestellten Berechnungen für die d = 10 nm QDs sagen das E . voraus g,eff = 0,76 eV effektive Energielücke, was in vernünftiger Übereinstimmung mit dem Experiment ist und daher die hypothetische Annahme des Niederenergie-PL-Peakursprungs unterstützt.
Schlussfolgerungen
Zusammenfassend wurden mehrere GaAsBi/AlAs-geschichtete Quantentopfstrukturen durch einen gemischten MBE/MEE-Prozess auf GaAs-Substraten gezüchtet. Nach dem thermischen Ausheilen der Strukturen nach dem Wachstum bei 750 °C wurden zahlreiche relativ niedrig dispergierte Nanopartikel in GaAsBi-Quantentöpfen nukleiert. HRTEM-, EDS- und Raman-Spektroskopiemessungen zeigen, dass die Nanokristalle überwiegend aus Bismut bestehen. Die durchgeführten Photolumineszenzmessungen zeigen einen zusätzlichen niederenergetischen, 0,85 eV, PL-Peak, der in den getemperten Proben auftritt. Der niederenergetische PL-Peak kann vermutlich auf optische Übergänge in Bi-Nanokristallen zurückzuführen sein, die durch die Quantengrößeneffekte in den Halbleiterzustand mit direkter Bandlücke umgewandelt werden. Die durchgeführten Schätzungen des Energiespektrums der Bi-Quantenpunkte unterstützen die Annahme. Für eine definitive Antwort sind weitere und detaillierte experimentelle und theoretische Arbeiten erforderlich.
Abkürzungen
- EDS:
-
Energiedispersive Spektroskopie
- HAADF:
-
Ringförmiges Dunkelfeld mit großem Winkel
- HRTEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- MBE:
-
Molekularstrahlepitaxie
- MEE:
-
Migrationsverstärkte Epitaxie
- PL:
-
Photolumineszenz
- QD:
-
Quantenpunkt
- QW:
-
Quantenbrunnen
- RTA:
-
Schnelles thermisches Glühen
- MINT:
-
Rastertransmissionselektronenmikroskopie
- TO und LO:
-
Transversale optische bzw. longitudinale optische Phononenmoden
Nanomaterialien
- N,N-Dimethylformamid, das die Fluoreszenz von MXen-Quantenpunkten für die empfindliche Bestimmung von Fe3+ reguliert
- Synthese von Pyridin-reichen N,S-codotierten Kohlenstoff-Quantenpunkten als wirksame Enzymnachahmer
- Grüne Synthese von InP/ZnS-Kern/Schale-Quantenpunkten für die Anwendung in schwermetallfreien Leuchtdioden
- Ein einfacher Ansatz zur Synthese von fluoreszierenden Kohlenstoffquantenpunkten aus Tofu-Abwasser
- Synthese wasserlöslicher Antimonsulfid-Quantenpunkte und ihre photoelektrischen Eigenschaften
- Einfache sonochemische Synthese in einem Schritt und photokatalytische Eigenschaften von Graphen/Ag3PO4-Quantenpunkt-Kompositen
- Eliminierung der bimodalen Größe in InAs/GaAs-Quantenpunkten zur Herstellung von 1,3-μm-Quantenpunktlasern
- Abhängigkeit der Hüllendicke des Energietransfers zwischen den Teilchen in Kern-Schale-ZnSe/ZnSe-Quantenpunkten mit Europiumdotierung
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster
- Synthese und Eigenschaften von wasserlöslichen blau emittierenden Mn-legierten CdTe-Quantenpunkten



