Hohe Durchbruchspannung und niedriger dynamischer EIN-Widerstand AlGaN/GaN-HEMT mit Fluorionenimplantation in SiNx-Passivierungsschicht
Zusammenfassung
In dieser Studie haben wir eine hohe Durchbruchspannung (BV) und einen niedrigen dynamischen ON-Widerstand (R EIN, D ) AlGaN/GaN-Transistor mit hoher Elektronenmobilität (HEMT) durch Implantieren von Fluorionen in das dicke SiNx Passivierungsschicht zwischen Gate- und Drain-Elektrode. Anstelle der Fluorionenimplantation in die dünne AlGaN-Barriereschicht sind bei der Fluorionenimplantation in der dicken Passivierungsschicht die Peakposition und die Leerstellenverteilungen weit vom zweidimensionalen Elektronengaskanal (2DEG) entfernt, was die direkte Strom (DC) statische und gepulste dynamische Kennlinienverschlechterung. Die Fluorionen in der Passivierungsschicht erweitern auch den Verarmungsbereich und erhöhen die durchschnittliche elektrische Feldstärke (E-Feld) zwischen Gate und Drain, was zu einer erhöhten BV führt. Die BV des vorgeschlagenen HEMT steigt von 680 V des herkömmlichen AlGaN/GaN-HEMT (Conv. HEMT) mit den gleichen Dimensionsparametern auf 803 V an. Der gemessene R EIN, D des vorgeschlagenen HEMT wird bei einer hohen Drain-Ruhevorspannung von 100 V nur um 23% erhöht, während der R EIN, D des HEMT mit Fluorionenimplantation in der dünnen AlGaN-Barriereschicht um 98% erhöht.
Hintergrund
In den letzten Jahrzehnten wurden neuartige Halbleitermaterialien wie GaN, Metalloxide und 2D-Materialien umfassend untersucht, um die Energieumwandlungs- und Speichereffizienz aufgrund ihrer überlegenen Material- und Bauelementeeigenschaften weiter zu verbessern [1,2,3,4, 5,6,7,8]. Unter ihnen sind GaN-basierte AlGaN/GaN-Transistoren mit hoher Elektronenmobilität (HEMTs) gute Kandidaten für Anwendungen mit hoher Leistung, hoher Frequenz und geringem Verlust aufgrund des hohen kritischen Durchbruchfelds und der hohen Elektronenmobilität [9,10,11,12,13 ,14]. Die Durchbruchspannung (BV) ist eines der wichtigsten Designziele, und die berichteten Werte liegen noch weit unter der theoretischen Grenze [15, 16]. Daher ist es von großer Bedeutung, die BV weiter zu verbessern, insbesondere nicht auf Kosten einer Erhöhung der Gerätegröße. Zur Verbesserung der BV wurden mehrere Terminierungstechniken vorgeschlagen, wie z. B. Feldplatten [17,18,19], Fluorionenimplantation [20,21,22] und vertiefte Gate-Rand-Terminierung [23, 24]. In die dünne AlGaN-Barriereschicht (FBL) [22] implantierte Fluorionen haben einen einfachen Herstellungsprozess, ohne eine zusätzliche parasitäre Kapazität zu induzieren; die Peakposition des Fluorprofils und der Leerstellenverteilungen liegt jedoch nahe am zweidimensionalen Elektronengaskanal (2DEG), was unweigerlich zu einer signifikanten Verschlechterung der statischen und dynamischen Eigenschaften führen würde.
In dieser Arbeit werden eine hohe Durchbruchspannung und ein niedriger dynamischer ON-Widerstand (R EIN, D ) AlGaN/GaN HEMT mit Fluorionenimplantation im SiNx Passivierungsschicht (FPL HEMT) experimentell untersucht. Anders als bei der Fluorionenimplantation in die dünne AlGaN-Barriereschicht könnte eine Fluorionenimplantation in die dicke Passivierungsschicht die Peakposition von Fluor und Leerstellenverteilungen weit vom 2DEG-Kanal entfernt halten und somit die statische und dynamische Charakteristikverschlechterung effektiv unterdrücken . Fluorionen in der Passivierungsschicht als Abschlusstechnik werden auch verwendet, um die Verteilung des elektrischen Oberflächenfelds (E-Feld) zu optimieren, wodurch eine verbesserte BV erreicht wird. Zusammenfassend lässt sich sagen, dass der FPL HEMT hervorragende statische und dynamische Eigenschaften aufweist.
Herstellungsmethoden
Abbildung 1 ist das dreidimensionale Schema von FPL HEMT, FBL HEMT und Conv. HEMT bzw. Alle Geräte haben eine Gate-Länge von L G von 2.5 μm, ein Gate-Source-Abstand L GS von 1,5 μm und einem Gate-Drain-Abstand L GD von 10 μm. Die zur Herstellung des FPL-HEMT verwendete epitaktische AlGaN/GaN-Heterostruktur wurde auf einem 6-Zoll-(111)-Siliziumsubstrat durch metallorganische chemische Gasphasenabscheidung (MOCVD) aufgewachsen. Die Epitaxieschichten bestehen aus einer 2-nm-GaN-Kappe, 23-nm-Al0,25 Ga0,75 N-Barriere, 1-nm-AlN-Zwischenschicht, 150-nm-GaN-Kanal und 3,5-μm-GaN-Puffer. Die gemessene Hall-Effekt-Dichte und -Mobilität des 2DEG betrug 9,5 × 10 12 cm −2 und 1500 cm 2 /V s bzw. Das vorgeschlagene FPL-HEMT begann mit einer Mesa-Isolation, die durch ein Hochleistungs-Cl2 . implementiert wurde /BCl3 -basiertes Ätzen mit induktiv gekoppeltem Plasma (ICP). Dann eine 40 nm dicke Niederdruck-Chemical-Vapour-Deposition (LPCVD) SiNx Schicht wurde bei 780 °C/300 mTorr mit einem NH3 . abgeschieden Durchfluss von 280 sccm und einem SiH2 Kl2 Fluss von 70 sccm, was eine Abscheidungsrate von 3,7 nm/min ergibt. Der Brechungsindex wird mit einem Ellipsometer als 1,978 gemessen und das N/Si-Verhältnis von SiNx ist 1,31 [25]. Die Kristallinität von LPCVD SiNx amorph ist, was durch ein hochauflösendes Transmissionselektronenmikroskop (HR-TEM)-Mikrobild bestätigt wird (siehe Einschub von Abb. 1a). Nach Öffnen der Source- und Drain-Kontaktfenster durch SF6 Plasma-Trockenätzen wurde der ohmsche Kontakt Ti/Al/Ni/Au (20/150/45/55 nm) abgeschieden und bei 890 °C für 30 s in N2 . getempert Umgebungs. Der Kontaktwiderstand von 1 mm und der Schichtwiderstand von 400 Ω/Quadrat wurden durch das lineare Übertragungsleitungsverfahren extrahiert. Als nächstes wird die Gate-Metallelektrode durch einen Ni/Au (50 nm/150 nm) Abscheidungs- und Abhebeprozess gebildet. Dann wird das Fluorionenimplantationsfenster (Länge des Fensters = 3 μm) durch AZ5214 Photoresist gebildet, und Fluorionen wurden durch SEN NV-GSD-HE Ionenimplanter bei einer Energie von 10 keV bei einer Dosis von 1 × 1012 cm −2 . Schließlich wurden die Proben bei 400°C für 15 min in N2 . getempert Umgebung, um den Transistorherstellungsablauf zu vervollständigen [26].
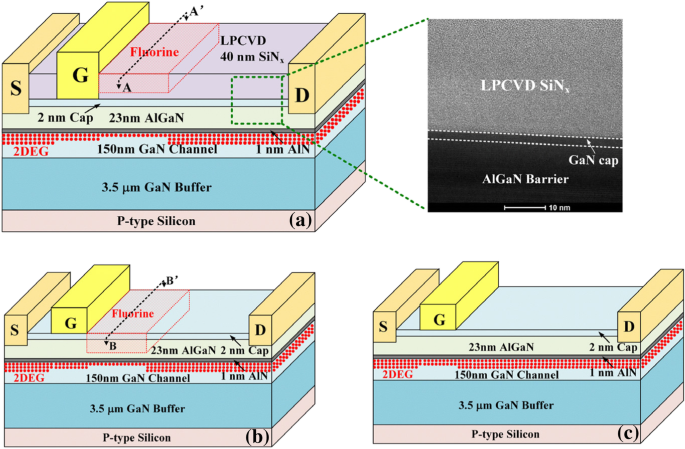
Dreidimensionales Schema von a FPL HEMT (Einschub:HR-TEM-Aufnahme von LPCVD SiNx ), b FBL HEMT und c Konv. HEMT
Ergebnisse und Diskussion
Abbildung 2 zeigt das gemessene Sekundärionen-Massenspektroskopie-(SIMS)-Profil der Fluorionenkonzentration und der simulierten Leerstellenkonzentration durch TRIM entlang der Schnittlinien:(a) A-A′ von FPL HEMT und (b) B-B′ von FBL HEMT bzw. Bei gleicher Energie und Dosis der Fluorionenimplantation sind die gemessene Peakposition von der Oberfläche und die maximale Konzentration des Fluorprofils für die beiden Strukturen fast gleich. Bei der Fluorionenimplantation in die dünne AlGaN-Barriereschicht erstrecken sich die durch Fluor induzierten Leerstellen bis in den 2DEG-Kanalbereich. Die Verteilung der Leerstellenkonzentration ist an jeder Grenzfläche diskontinuierlich, da die Bindungsenergie jedes Materials unterschiedlich ist [27]. Im Fall der Fluorionenimplantation in das dicke SiNx Passivierungsschicht liegt die Leerstellenverteilung innerhalb des SiNx Passivierungsschicht und weit vom 2DEG-Kanal entfernt. Die durch die Ionenimplantation induzierten Leerstellen würden den 2DEG-Kanal einfangen, und 2DEG könnte leicht eingefangen werden, wenn die Leerstellenverteilung nahe dem 2DEG liegt [28]. Zusammenfassend lässt sich sagen, dass die Implantation von Fluorionen in das dicke SiNx Passivierungsschicht könnte den Einfluss der Ionenimplantation auf den 2DEG-Kanal deutlich reduzieren und die Verschlechterung der statischen und dynamischen Eigenschaften effektiv unterdrücken.

Gemessenes SIMS-Profil der Fluorionenkonzentration und simulierte Leerstellenkonzentration durch TRIM entlang der Schnittlinien. a A-A′. b B-B′
Abbildung 3 beleuchtet das gemessene I-V Übertragungseigenschaften und Gleichstrom-(DC)-Ausgangseigenschaften. Im Vergleich zum Conv. HEMT, sowohl FPL HEMT als auch FBL HEMT zeigen eine Abnahme von I DS und eine Erhöhung des statischen ON-Widerstands (R EIN ), da die Fluorionen die unterstützte Verarmung des 2DEG in der Driftregion bewirken und damit die 2DEG-Dichte verringern [29]. Außerdem verringert die Ionenimplantation auch die 2DEG-Mobilität. Die mit Hall-Effekt gemessenen 2DEG-Mobilitäten der FPL- und FBL-HEMTs betragen 228 cm 2 . /V s und 203 cm 2 /V s nach der Ionenimplantation. Aufgrund der gleichen Dosis an Fluorionen sind die Ausgangscharakteristik und R EIN von FPL HEMT und FBL HEMT sind bei einer niedrigen Drainspannung (z. B. V DS < 3 V). Wenn jedoch V DS> 3 V, der Sättigungs-Drain-Stromkollaps tritt im FBL-HEMT auf, da sich das Leerstellenprofil von Fluor bis in die 2DEG-Kanalregion erstreckt, und das 2DEG könnte leicht durch diese durch Fluor induzierten tiefen Leerstellen eingefangen werden, wenn die Drain-Spannung größer als kritisch ist Drainspannung (z. B. V DS> 3 V) [30], wodurch der Drainstrom verringert wird. Die Leerstellenverteilung von FPL HEMT ist weit vom 2DEG-Kanal entfernt, wodurch der Zusammenbruch des Sättigungs-Drain-Stroms effektiv unterdrückt wird.

Gemessen a I-V Übertragungseigenschaften und b DC-Ausgangscharakteristik für drei HEMTs
Abbildung 4 zeigt den gemessenen I-V Eigenschaften und simulierte Oberflächen-E-Feld-Verteilungen auf den Sperrzustand. Die BVs der FPL/FBL/Conv. HEMTs sind jeweils 803/746/680 V. Die BV ist definiert als die Drain-Source-Spannung beim Drain-Strom (I DS ) von 1 μA/mm mit V GS =– 4 V. Die Fluorionen zwischen Gate und Drain reduzieren als Abschlusstechnik den E-Feld-Peak am Gate-Rand und verursachen einen neuen E-Feld-Peak am Ende des Ionenimplantationsbereichs, und somit FPL HEMT und FBL HEMT erreichen eine gleichmäßigere E-Feldverteilung auf der Oberfläche und eine höhere BV als die des Conv. HEMT. Im Vergleich zu FPL HEMT hat FBL HEMT einen verbesserten Modulationseffekt des elektrischen Felds, da das Fluorionenprofil nahe am 2DEG-Kanal liegt. Beim FBL HEMT würde die Ionenimplantation jedoch unweigerlich zusätzliche Schäden in der AlGaN-Barriere verursachen [31, 32], was zu einem kontinuierlichen Gate-Leckstrompfad der Gate-Barriere-Schicht-2DEG . führt; daher ist die BV von FBL HMET etwas kleiner als die von FPL HEMT.

a Gemessener Aus-Zustand I-V Eigenschaften mit einer Gatespannung von –4 V, wodurch das Substrat schwebend gehalten wird. b Simulierte Oberflächen-E-Feld-Verteilungen bei V DS = 150 V
Gepulst ich DS -V DS Messungen [33] unter langsamem Schalten wurden durchgeführt, um das Verhalten des dynamischen EIN-Widerstands (R EIN, D ) der hergestellten AlGaN/GaN-HEMTs. Abbildung 5a ist das Schema, das das Anlegen einer Belastungsspannung während des gepulsten I . zeigt DS -V DS Messungen. In gepulstem I-V Messungen wurden die Gate- und Drain-Elektroden der GaN-HEMTs vor jedem I-V . kurzen Spannungspulsen ausgesetzt Messung, um sicherzustellen, dass sich die Geräte im ausgeschalteten Zustand befanden. Die Pulsbreite beträgt 3 µms und die Periode beträgt 5 µms. Abbildung 5 b–d zeigen den Vergleich der gepulsten Ausgangskennlinien der Geräte unter (V GS0 , V DS0 ) von (0 V, 0 V) und (0 V, 100 V). Es ist ersichtlich, dass der dynamische ON-Widerstand für Conv eine geringfügige Verschlechterung (12,3%) aufweist. HEMT, aufgrund des Fehlens eines Fluorionenimplantationsprozesses. Im Vergleich zu FBL HEMT weist FPL HEMT eine geringe Verschlechterung des dynamischen ON-Widerstands auf. Aufgrund der Passivierungsschicht ist die Leerstellenverteilung weit entfernt vom 2DEG-Kanal und befindet sich innerhalb der Passivierungsschicht, was das Ladungseinfang im FPL-HEMT unterdrückt. Abbildung 6 fasst die Verhältniswerte von R . zusammen EIN, D /R EIN für die drei HEMTs unter (V GS0 , V DS0 ) von (0 V, 0 V) und (0 V, 100 V) in einem Schritt von 20 V. Für den FBL HEMT ist der gemessene R EIN, D ist bereits bei (V .) um 98% des statischen erhöht GS0 , V DS0 ) von (0 V, 0 V) und (0 V, 100 V), während das R EIN, D des FPL HEMT wird bei einer hohen Drain-Ruhevorspannung von 100 V nur um 23% erhöht.
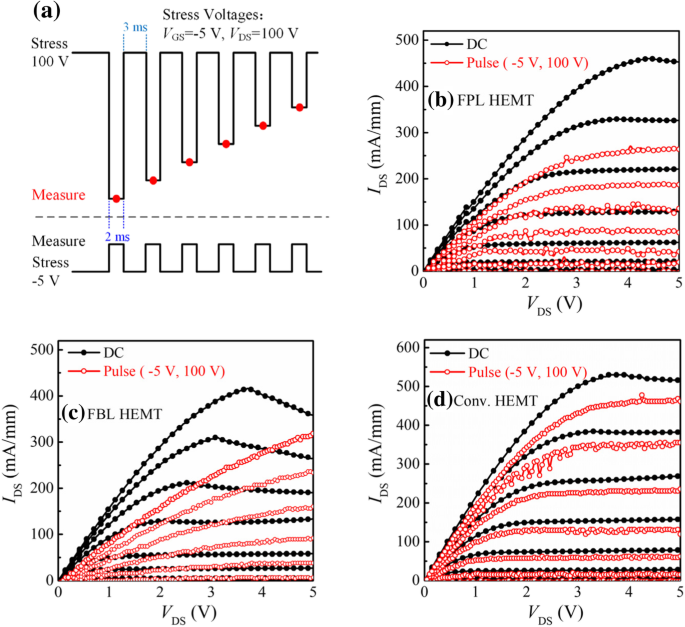
a Schematische Darstellung des Anlegens der Belastungsspannung während des gepulsten I DS -V DS Messungen. Gepulst ich DS -V DS Eigenschaften der hergestellten AlGaN/GaN-HEMTs mit b FPL-HEMT, c FBL HEMT und d Konv. HEMT (V GS = − 4~0 V; Schritt:0.5 V)
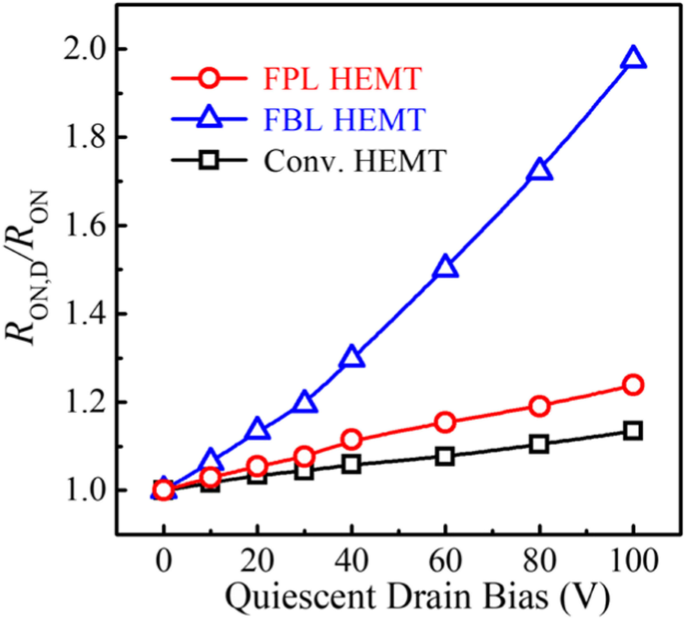
Verhältnis von R EIN, D /R EIN für die hergestellten HEMTs an verschiedenen Ruhe-Drain-Vorspannungspunkten. Die Pulsbreite und -periode beträgt 3 ms bzw. 5 ms
Schlussfolgerungen
Zusammenfassend haben wir einen neuartigen AlGaN/GaN-HEMT mit hoher Durchbruchspannung und niedrigem dynamischen ON-Widerstand vorgeschlagen. Es verfügt über eine Fluorionenimplantation in das dicke SiNx Passivierungsschicht. Die Implantation von Fluorionen in die Passivierungsschicht könnte die Verschlechterung der elektrischen Eigenschaften wirksam unterdrücken. Der dynamische EIN-Widerstand ist nur 1,23-mal so groß wie der statische EIN-Widerstand nach Aus-Zustand V DS Spannung von 100 V, während sie beim FBL HEMT das 1,98-fache beträgt. Außerdem modulieren die Fluorionen in der Passivierungsschicht auch die E-Feld-Verteilung und verteilen den Verarmungsbereich; somit erhöht sich die BV des vorgeschlagenen HEMT von 680 V eines herkömmlichen AlGaN/GaN-HEMT auf 803 V.
Verfügbarkeit von Daten und Materialien
Alle während dieser Studie generierten oder analysierten Daten sind in diesem veröffentlichten Artikel enthalten.
Abkürzungen
- 2DEG:
-
Zweidimensionales Elektronengas
- HEMT:
-
Transistor mit hoher Elektronenmobilität
- ICP:
-
Induktiv gekoppeltes Plasma
- LPCVD:
-
Chemische Gasphasenabscheidung bei niedrigem Druck
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- SIMS:
-
Sekundärionen-Massenspektroskopie
- TEM:
-
Transmissionselektronenmikroskop
Nanomaterialien
- Was ist Pannenwartung und wie man damit umgeht
- Einfluss von Oberflächenzuständen und Aluminium-Molekülfraktion auf das Oberflächenpotential und 2DEG in AlGaN/GaN-HEMTs
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- RGO und dreidimensionale Graphen-Netzwerke modifizierte TIMs mit hoher Leistung gemeinsam
- Graphen/Polyanilin-Aerogel mit Superelastizität und hoher Kapazität als hochkompressionstolerante Superkondensatorelektrode
- Dickenabhängigkeit von Grenzflächen- und elektrischen Eigenschaften in Atomlagen-abgeschiedenem AlN auf c-Ebenen-GaN
- Atomschicht-abgeschiedener HfAlOx-basierter RRAM mit niedriger Betriebsspannung für Computing-In-Memory-Anwendungen
- Lateraler, doppelt diffundierter Metall-Oxid-Halbleiter-Transistor mit extrem niedrigem spezifischen On-Widerstand mit verbessertem Dual-Gate und partieller P-vergrabener Schicht
- Eine widerstandslose Spannungsreferenz im Nanomaßstab mit hohem PSRR
- PCB-Materialien und Design für Hochspannung



