Widerstandsarme Schaltcharakteristik in HfO2/TiOx Bi-Layer Resistive Random-Access Memory
Zusammenfassung
Resistive Direktzugriffsspeicher mit Atomlagenabscheidung HfO2 und Hochfrequenz-Sputtern von TiOx als Widerstandsschaltschichten erfolgreich hergestellt wurden. Im HfO2 wurde eine Low-Power-Kennlinie mit 1,52 µW eingestellter Leistung (1 µA bei 1,52 µV) und 1,12 µW Rückstellleistung (1 µA bei 1,12 µV) erhalten /TiOx resistive Speicher mit wahlfreiem Zugriff (RRAM) durch Steuerung des Sauerstoffgehalts des TiOx Schicht. Außerdem ist der Einfluss des Sauerstoffgehalts während des TiOx Sputterprozess auf die Widerstandsschalteigenschaften wird im Detail diskutiert. Die Untersuchungen zeigten, dass während des elektrischen Umformungs-/Abbindeprozesses im HfO2 . leicht ein „weicher Durchschlag“ auftrat /TiOx RRAM-Geräte mit hohem Sauerstoffgehalt des TiOx Schicht, was zu einer hohen ohmschen Schaltleistung führt. Die Low-Power-Charakteristik wurde in HfO2 . erhalten /TiOx RRAM-Bausteine mit entsprechend hoher Sauerstoffleerstellendichte von TiOx Schicht, was darauf hindeutet, dass die entsprechende Sauerstoffleerstellendichte im TiOx Schicht könnte einen „weichen Durchbruch“ durch die gesamten dielektrischen Schichten während des Formungs-/Setzprozesses vermeiden, wodurch der durch das RRAM-Bauelement fließende Strom begrenzt und der Betriebsstromverbrauch verringert wird.
Einführung
Resistiver Direktzugriffsspeicher (RRAM) bietet aufgrund der einfachen Zellenstruktur, der nichtflüchtigen Speicherung, des Hochgeschwindigkeitsbetriebs und des hohen Ein-/Aus-Verhältnisses eine vielversprechende Lösung für die Verkleinerung über den herkömmlichen ladungsbasierten Speicher hinaus [1,2,3, 4,5,6,7,8,9,10]. In letzter Zeit ist Ein-Transistor-Ein-Widerstand (1T1R) eine weithin akzeptierte Struktur, um ungenaue Widerstandsmessungen zu verhindern, die durch einen Kriechpfadstrom im 1R-Array verursacht werden [11, 12]. Außerdem wurde der aufkommende Speicher, insbesondere RRAM auf Oxidbasis, für synaptische Bauelemente aus Kunststoff aufgrund der allmählichen Leitfähigkeitsmodulation mit der Pulszahl vorgeschlagen, die das biologische synaptische Verhalten nachahmen kann, um Signale von prä- und postsynaptischen Neuronen zu empfangen [13,14,15 ,16,17]. Ein hoher ohmscher Schaltstrom ist jedoch die Haupteinschränkung für Anwendungen mit geringer Leistung und hoher Dichte [18, 19, 20]. Das 1T1R-Array steht auch vor Skalierungsherausforderungen, wenn der Betriebsstrom des RRAM nicht entsprechend skaliert werden kann. Wenn beispielsweise die CMOS-Technologie auf 27 nm herunterskaliert wird, sinkt der Ansteuerstrom auf 40 μA [21]. Daher ist es erforderlich, den Betriebsstrom des RRAM-Bauelements durch Optimierung von Struktur und Material auf 10 μA zu reduzieren, um die 1T1R-Skalierung fortzusetzen [22]. Darüber hinaus verbrauchen biologische Synapsen im komplexen menschlichen Gehirn etwa 1 ~ 10 fJ pro Ereignis, daher ist es für die Entwicklung neuromorpher künstlicher neuronaler Netze (ANNs) wichtig, den Energieverbrauch elektrischer Synapsen so wenig wie biologischer Synapsen zu reduzieren [23, 24,25]. Daher wird die Begrenzung des Gerätestroms und die Reduzierung des Stromverbrauchs dem praktischen Prozess für die Datenspeicherung und neuromorphen Computeranwendungen zugute kommen.
In dieser Arbeit wird Pt/HfO2 /TiOx /Pt-Geräte mit einem anderen Sauerstoffgehalt von TiOx Film hergestellt, und eine Niedrigleistungscharakteristik bei niedrigem Sauerstoffgehalt wurde demonstriert. Das Speichergerät erreichte 1,52 µW Set Power und 1,12 µW Reset Power durch den sinkenden Sauerstoffgehalt des TiOx Film während des Sputterprozesses. Der Leitfähigkeitsmechanismus für die Low-Power-Eigenschaft wurde weiter analysiert, um Einblicke in das Oxid-RRAM-Design zu erhalten.
Methoden
Das Pt/HfO2 /TiOx /Pt-Bauelementstruktur und Herstellungsprozess sind in Fig. 1a und b gezeigt. Zuerst auf Si/SiO2 /Ti-Substrat wurde eine 100-nm-Pt-Bodenelektrode (BE) durch Gleichstromsputtern (DC) bei Raumtemperatur hergestellt. Als nächstes 3 nm HfO2 wurde durch Atomlagenabscheidung (ALD) (Picosun R200) bei 300°C unter Verwendung von TEMAH und H2 . abgeschieden O als Vorläufer. Anschließend 30 nm TiOx wurde mit unterschiedlichem Sauerstoffgehalt durch Hochfrequenzsputtern abgeschieden. Während TiOx Filmzerstäubungsprozess, Fixieren des gesamten Gasflusses von Argon (Ar) und Sauerstoff (O2 ) als 20 sccm und einer Änderung des Sauerstoffpartialdrucks mit 9%, 11% und 13% wurden drei Probengeräte (S1, S2 und S3) erhalten, um den Einfluss des Sauerstoffgehalts von TiOx Film über die ohmsche Schaltleistung. Anschließend wurde eine 70-nm-Pt-Top-Elektrode (TE) durch DC-Sputtern abgeschieden und mit Lithographie strukturiert. Schließlich wurden durch reaktives Ionenätzen (RIE) quadratische Vorrichtungen mit 100 μm × 100 μm gebildet. An das TE wurde eine Vorspannung angelegt, und das BE wurde mit Masse verbunden. Das hochauflösende Transmissionselektronenmikroskop (HRTEM) des Querschnitts des Pt/HfO2 /TiOx /Pt sind in Abb. 2 dargestellt. Die elektrischen Eigenschaften der Geräte wurden mit dem Halbleiterparameteranalysator Agilent B1500A gemessen. Die chemischen Zustände der Atome im TiOx Filme wurden durch Röntgen-Photoelektronen-Spektroskopie (XPS, Axis Ultra) untersucht.
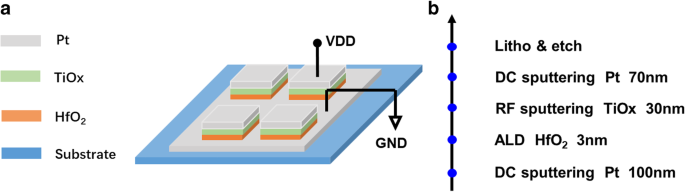
a Die Struktur von Pt/HfO2/TiOx /Pt-Gerät. b Der Herstellungsprozessablauf
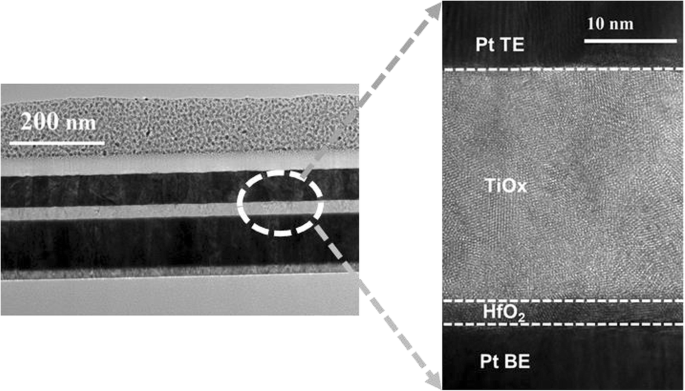
TEM-Querschnitte des Pt/HfO2 /TiOx /Pt-Gerät
Ergebnisse und Diskussion
Abbildung 3a, b und c zeigen die XPS O 1s-Kernspektren von TiOx Filme. Um die chemische Bindung von Sauerstoff in den Filmen aufzuklären, werden die asymmetrischen O 1s-Peaks in zwei Peaks unterteilt, die im Allgemeinen dem O 2− . zugeschrieben werden gebunden durch Metallionen und O 2− im Sauerstoffmangelbereich [26]. Sauerstoffpartialdruck während TiOx Filmzerstäubungsverfahren wurde auf 9 %, 11 % bzw. 13 % eingestellt, und der entsprechende Sauerstoffmangelgehalt in drei Proben beträgt etwa 28,23 %, 24,06 % und 23,63 %, was darauf hindeutet, dass der Gehalt an Nichtgitter-Sauerstoffionen und Sauerstoffleerstellen nehmen mit steigendem Sauerstoffpartialdruck ab.

O 1s XPS-Scanspektren von TiOx Filme in S1, S2 und S3. Der Sauerstoffpartialdruck wurde als a . eingestellt 9 %, b 11 % und c 13% während TiOx Film-Sputter-Verfahren
Bei den frischen Geräten befindet sich der Originalzustand im High Resistance State (HRS). Wie in Fig. 4 gezeigt, wird Stromformung (CF) angewendet, um die Bildung des leitfähigen Filaments zu initiieren und den Gerätezustand in den Zustand mit niedrigem Widerstand (LRS) zu ändern [27]. Beim Anlegen von 1 μA Stromnachgiebigkeit wird in S1 ein leitender Pfad gebildet und der stabile Set/Reset-Prozess kann im nachfolgenden Vorgang erreicht werden. Für S2 und S3 ist der Reset-Vorgang aus dem mittleren Zustand des Geräts während des CF-Prozesses nicht erfolgreich, bis die Stromkompatibilität bis zu 20 mA beträgt.
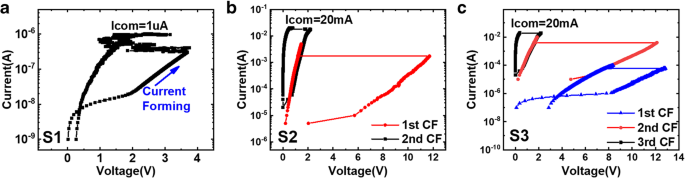
Aktueller Umformprozess des Pt/HfO2/TiOx /Pt RRAM-Gerät in a S1, b S2 und c S3
Um die elektrische Leistung des RRAM-Bausteins zu testen, werden Gleichstrommessungen unter Spannungsdurchlauf durchgeführt. Eine positive Vorspannung beim Formungs- und Setzprozess wird an TE angelegt, um den leitenden Faden zu vervollständigen, und eine negative Vorspannung beim Rücksetzprozess dient zum Unterbrechen des Fadens. Wenn die Vorspannung hin und her gewobbelt wird, sind 100 Zyklen von bipolaren Schaltstrom-Spannungs-(IV)-Kurven von drei Proben in Abb. 5 gezeigt. Die S1-Bauelemente erreichen eine stabile Widerstandsschaltleistung unter 10 μA Stromkonformität, aber der Betriebsstrom beträgt bis zu 10 mA für die anderen beiden Proben. Die Low-Power-Eigenschaft von S1 könnte auf einen hohen Sauerstoffleerstellengehalt zurückgeführt werden, der bereits in TiOx . vorhanden war Film, der den Strom während des Umform-/Abbindeprozesses effektiv begrenzt.
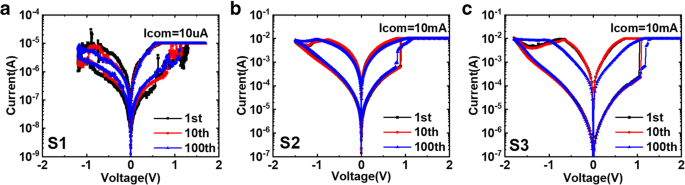
100 Zyklen stabile bidirektionale I-V-Kurven in a S1, b S2 und c S3
Die Abbildungen 6 und 7 zeigen die Variation von Zyklus zu Zyklus und von Gerät zu Gerät (relative Standardabweichung, (σ /μ )) von drei Proben, und die Statistiken sind in den Tabellen 1 und 2 zusammengefasst. Für S1 verursacht ein schwacher Sprungstrom eine mäßige Widerstandsverteilung, und die in S2 und S3 gebildeten stark leitfähigen Filamente garantieren eine relativ stabile Widerstandsverteilung. Obwohl sich S3 nach Dutzenden von Zyklen geringfügig verschlechtert, liegt das Ein-/Aus-Verhältnis immer noch über 100.

Variation von Zyklus zu Zyklus von RLRS und RHRS für 100 Zyklen in a S1, b S2 und c S3

Variation von Gerät zu Gerät von RLRS und RHRS für 20 Geräte in a S1, b S2 und c S3
Wie in Abb. 8 gezeigt, werden die eingestellte Leistung (Pset) 1,52 μW und die Rücksetzleistung (Preset) 1,12 μW bei einem niedrigen Compliance-Strom von 1 μA erreicht. Die Leistungsaufnahme der anderen beiden Proben beträgt aufgrund eines Betriebsstroms von 10 mA mehrere zehn Milliwatt. Außerdem können die Widerstandszustände von S1 die Retentionseigenschaften über 10 4 . halten s unter 85 °C mit einem Ein/Aus-Verhältnis von ungefähr 100, das für Datenspeicheranwendungen stabil ist.
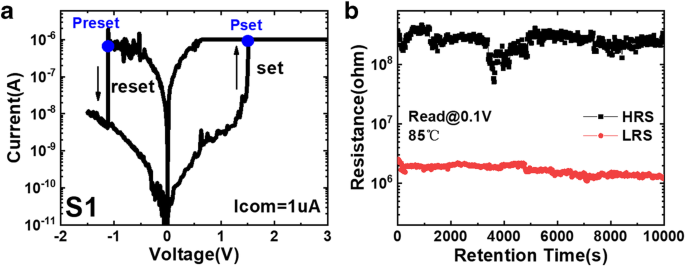
a Widerstandsschaltleistung unter 1 μA Strombegrenzung. b Aufbewahrungscharakteristik in S1 ist über 10 4 s unter 85 °C
Um den konduktiven Mechanismus der Low-Power-Charakteristik aufzuklären, haben wir Temperaturmessungen für S1 und S3 mit unterschiedlichen Betriebsströmen durchgeführt und den entsprechenden Mechanismus untersucht, wie in Abb. 9 und 10. Von 25 °C bis 125 °C nimmt der Widerstand von S1 mit der Temperatur ab, aber der Widerstand von S3 ändert sich fast nicht. Die experimentelle Leitfähigkeit und Temperatur wurden mit Motts Variable Range Hopping-Modell [28] angepasst, wie in Abb. 11 gezeigt, was darauf hinweist, dass der Hauptleitmechanismus von S1 Elektronen-Hopping über lokalisierte Sauerstoffleerstellendefekte im dielektrischen Oxid ist [29]. Beim Absenken des Sauerstoffpartialdrucks während des TiOx Sputterprozess, wie in S1 gezeigt, den Sauerstoffleerstellengehalt im anfänglichen TiOx Schicht steigt und der Filmwiderstand sinkt [30]. Die Spannung am TE wird hauptsächlich am HfO2 . angelegt Schicht und eine Masse von Sauerstoffleerstellen werden motiviert, um den leitfähigen Faden zu bilden. Danach werden auch neue Sauerstoff-Leerstellen im TiOx . motiviert Schicht, aber der Zusammenhang zwischen Sauerstoffleerstellen ist schwach. Daher springen Elektronen in TiOx ist dominant, was einen niedrigen ohmschen Schaltstrom von 1 μA gewährleistet.

a Der Widerstand ändert sich mit der Temperatur in S1. b Das entsprechende schematische Diagramm des leitfähigen Mechanismus

a Der Widerstand ändert sich mit der Temperatur in S3. b Das entsprechende schematische Diagramm des leitfähigen Mechanismus

Temperaturabhängigkeit des Leitwerts von S1 in a LRS und b HRS
Jedoch, wie in Abb. 10 gezeigt, nach Erhöhung des Sauerstoffgehalts während TiOx Sputterprozesses bleiben HRS und LRS mit der Temperatur fast unverändert, was höchstwahrscheinlich mit dem metallähnlichen Transportmechanismus verbunden ist, der durch den Elektronentransport durch den leitfähigen Faden, der aus konzentrierten Sauerstoffleerstellen besteht, induziert wird. Verglichen mit dem RRAM-Baustein von S1 weniger Sauerstoff-Leerstellen im anfänglichen TiOx Schicht aus S3 reichen nicht für die Elektronensprungleitung. Außerdem ist aufgrund des erhöhten Widerstands von TiOx Film wird die Vorspannung an beide HfO2 . angelegt Schicht und TiOx Schicht gleichzeitig. Elektrische Initialisierung führt zu vielen Sauerstoff-Leerstellen motiviert in HfO2 und TiOx Schichten. Diese Sauerstoffleerstellen bilden in beiden dielektrischen Schichten einen stark leitfähigen Faden, und die reichlich ausgedehnten Elektronen fließen durch die beiden benachbarten Sauerstoffleerstellen, was während des Widerstandsschaltprozesses einen hohen Betriebsstrom verursacht.
Im Prinzip ist es möglich, den Sauerstoffgehalt sorgfältig zu steuern, um in anderen Oxidwiderstandsspeichern (OxRRAM) in Bezug auf die Sauerstoffleerstelle eine Leistung mit geringer Leistung zu erzielen. Die Anforderung an die Oxidschicht besteht darin, dass im Anfangszustand genügend Sauerstoffleerstellen vorhanden sind, um im Falle eines Geräteausfalls eine elektrische Hüpfleitung zu ermöglichen. Die übermäßigen Sauerstofffehlstellen führen jedoch zu einer instabilen Lebensdauereigenschaft und verschlechtern die Geräteleistung. Daher sind geeignete Sauerstoff-Leerstellen erforderlich, um den Betriebsstrom zu begrenzen und den Stromverbrauch zu senken.
Tabelle 3 vergleicht einige der wichtigsten Parameter von Pt/HfO2 /TiOx /Pt-Gerät mit anderen aktuellen Berichten. Das Gerät hat wichtige Vorzüge einer niedrigen ohmschen Schaltleistung von 1,12 μW und einem Verhältnis von über 100 HRS/LRS unter verschiedenen RRAM-Geräten.
Schlussfolgerungen
In dieser Arbeit wurde ein ohmscher Schaltstrom von 1 μA in Pt/HfO2 . demonstriert /TiOx /Pt-Strukturgerät. Für den leitfähigen Mechanismus ist die Elektronensprungleitung bei niedrigem Sauerstoffgehalt des TiOx . dominant Schicht, die den Betriebsstrom begrenzt und den Stromverbrauch verringert. Bei einem hohen Sauerstoffgehalt des TiOx . dominiert ein metallartiger Transport Schicht, und "soft-breakdown" von zwei dielektrischen Schichten verursacht einen hohen Betriebsstrom und einen hohen Stromverbrauch. Der entsprechende Sauerstoffgehalt von TiOx Film kann den RRAM-Strom begrenzen und zur Niedrigleistungscharakteristik beitragen, was eine Lösung für große Betriebsstrom- und Hochleistungsprobleme bietet und das Versprechen für zukünftige eingebettete nichtflüchtige Speicher und das Internet der Dinge (IoT)-Anwendungen zeigt.
Abkürzungen
- 1T1R:
-
Ein-Transistor-Ein-Widerstand
- ALD:
-
Atomlagenabscheidung
- ANNs:
-
Künstliche neuronale Netze
- BE:
-
Untere Elektrode
- CF:
-
Stromformung
- HRS:
-
Hochohmiger Zustand
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- IoT:
-
Internet der Dinge
- I-V:
-
Strom-Spannung
- LRS:
-
Niedriger Widerstandszustand
- Ein/Aus-Verhältnis:
-
HRS/LRS
- OxRRAM:
-
Oxidresistiver Speicher
- Voreinstellung:
-
Strom zurücksetzen
- Psatz:
-
Leistung einstellen
- RIE:
-
Reaktives Ionenätzen
- RRAM:
-
Resistiver Direktzugriffsspeicher
- TE:
-
Top-Elektrode
- XPS:
-
Röntgenphotoelektronenspektroskopie
- σ /μ :
-
Relative Standardabweichung
Nanomaterialien
- Sauerstoff
- Nanographem, flexibler transparenter Speicher auf Siliziumbasis
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Compliance-freier ZrO2/ZrO2 − x /ZrO2 Resistiver Speicher mit steuerbarem Grenzflächen-Mehrzustands-Schaltverhalten
- Ein RRAM-integrierter 4T SRAM mit selbsthemmender ohmscher Schaltlast durch reinen CMOS-Logikprozess
- Eine gemeinsame Studie zur Modellierung und Simulation von resistivem Direktzugriffsspeicher
- Ferroelektrischer Feldeffekt induzierter asymmetrischer ohmscher Schalteffekt in epitaktischen BaTiO3/Nb:SrTiO3-Heteroübergängen
- Sauerstoffreduktionsreaktion auf PtCo-Nanokatalysator:(Bi)Sulfat-Anionenvergiftung
- Eine Studie zur Variabilität des kontaktresistiven Direktzugriffsspeichers nach dem stochastischen Vakanzmodell
- Neue Methode stellt Computerspeicher aus Titanoxid her



