Ferroelektrikähnliches Verhalten ausgehend von Sauerstoffleerstellen-Dipolen in amorphem Film für nichtflüchtige Speicher
Zusammenfassung
Herkömmliche ferroelektrische Vorrichtungen leiden unter einem Mangel an Skalierbarkeit. Dotiertes HfO2 Dünnfilm ist vielversprechend, um das Skalierungsproblem zu lösen, wird jedoch durch hohe Leckströme und Gleichmäßigkeitsprobleme durch die polykristalline Natur herausgefordert. Stabiles ferroelektrisches Verhalten wird erstmals in einem 3,6 nm dicken amorphen Al2 . demonstriert O3 Film. Das amorphe Al2 O3 Die Bausteine sind hoch skalierbar und ermöglichen nichtflüchtige Multi-Gate-Feldeffekttransistoren (NVFET) mit Finnenabstand im Nanometerbereich. Es besitzt auch die Vorteile einer niedrigen Prozesstemperatur, einer hohen Frequenz (~GHz), eines breiten Speicherfensters und einer langen Lebensdauer, was auf ein großes Potenzial in VLSI-Systemen hindeutet. Die umschaltbare Polarisation (P ) induziert durch die spannungsmodulierten Sauerstoff-Leerstellen-Dipole vorgeschlagen.
Hintergrund
Ferroelektrischer Direktzugriffsspeicher (FeRAM) basierend auf herkömmlichen Perowskit-Ferroelektrika (z. B. PZT) war einer der kommerziellen nichtflüchtigen Speicher (NVMs) [1], obwohl er nicht skaliert und nicht CMOS-kompatibel ist. Ferroelektrizität wurde weithin in einer Vielzahl unterschiedlicher Materialien beobachtet, z. B. in den Aortenwänden von Schweinen [2], Sb2 S3 Nanodrähte [3], GaFeO3 Film [4], dotiertes Poly-HfO2 Filme [5], nanokristalline Hydroxyapatitfilme [6] und LaAlO3 -SrTiO3 filmen [7]. Unter diesen Materialien ist dotiertes HfO2 Filme haben aufgrund ihrer CMOS-Prozesskompatibilität besonderes Interesse für die NVM-Anwendung geweckt. Aber die polykristalline Struktur ist unvermeidlich, um in dotiertem HfO2 . Ferroelektrizität zu erzeugen , die folgende Hindernisse für die Geräteanwendung zu überwinden brachte:1) es ist nicht kompatibel mit der Gate-Last-Prozessierung im Hinblick auf das thermische Budget von 500 °C, das erforderlich ist, um orthorhombische Kristallphasen zu bilden [8]; 2) Der Stromverbrauch wird durch unerwünschten Leckstrom entlang der Korngrenzen induziert, der exponentiell zusammen mit der Verkleinerung der ferroelektrischen Dicke ansteigt. Kürzlich wurde in einer theoretischen Studie vorgeschlagen, dass die zusätzliche Ferroelektrizität in dickem Poly-HfO2 (>5 nm) kann von den weitreichenden Korrelationen bei der Anordnung elektrischer Dipole herrühren, die durch Sauerstoffleerstellen erzeugt werden [9]. Es wurde beobachtet, dass der Mechanismus zum Einfangen/Entpacken von Defektladungen das ferroelektrische Verhalten in einem 5 nm dicken amorphen Al2 . erzeugt O3 für einen Mehrzustandsspeicher, der jedoch unter einer sehr niedrigen Trapping/Detrapping-Frequenz leidet (z. B. ~500 Hz) [10].
In dieser Arbeit wird ein stabiles ferroelektrisches Verhalten in einem 3,6 nm dicken amorphen Al2 . demonstriert O3 Film, bei dem die schaltbare Polarisation (P ) wird vorgeschlagen, durch die spannungsmodulierten Sauerstoff-Leerstellen-Dipole induziert zu werden. Das amorphe Al2 O3 Film besitzt die Vorteile einer niedrigen Prozesstemperatur und einer Betriebsfrequenz von bis zu ~GHz, die einen nichtflüchtigen Multi-Gate-Feldeffekttransistor (NVFET) mit einem Finnenabstand im Nanometerbereich ermöglichen. Al2 O3 NVFET-Speicher mit 100-ns-Pulsweiten-Programmier-/Löschspannungen (P/E) und über 10 6 Die Ausdauer der P/E-Zyklen wird demonstriert. Die Auswirkungen von Elektroden und Filmdicke auf den P in Al2 O3 Kondensatoren werden ebenfalls untersucht. Die amorphen nichtflüchtigen Bauelemente weisen eine vielversprechende Zukunft bei VLSI-Speichern auf.
Methoden
Amorphes Al2 O3 Filme wurden auf Si(001), Ge(001) und TaN/Si-Substraten durch Atomlagenabscheidung (ALD) gezüchtet. TMA und H2 Als Vorläufer von Al bzw. O wurden O-Dampf verwendet. Während der Abscheidung wurde die Substrattemperatur auf 300 °C gehalten. Auf Al2 . wurden verschiedene obere Metallelektroden abgeschieden, darunter TaN/Ti, TaN und W O3 Oberflächen durch reaktives Sputtern. Kondensatoren mit unterschiedlichen Elektroden wurden durch lithographisches Strukturieren und Trockenätzen hergestellt. Rapid Thermal Annealing (RTA) bei 350 °C für 30 s wurde durchgeführt. NVFETs mit TaN/Al2 O3 Gatestapel wurden auf Ge(001) hergestellt. Nach der Gate-Bildung wurden Source/Drain (S/D)-Gebiete durch BF2 . implantiert + mit einer Dosis von 1 × 10 15 cm -2 und einer Energie von 20 keV und 20 nm dicke Nickel-S/D-Metallelektroden wurden dann durch den Abhebeprozess gebildet. Abbildung 1a und b zeigen die schematische Darstellung des hergestellten Al2 O3 Kondensator und den p-Kanal-NVFET. Zwischen der Elektrode und dem Al2 . befindet sich eine Grenzschicht (IL) O3 Film. Abbildung 1c und d zeigen die hochauflösenden Transmissionselektronenmikroskop(HRTEM)-Bilder des TaN/Al2 O3 /Ge-Stapel mit unterschiedlichem amorphem Al2 O3 Dicken (t AlO ) nach einer RTA bei 350 °C.
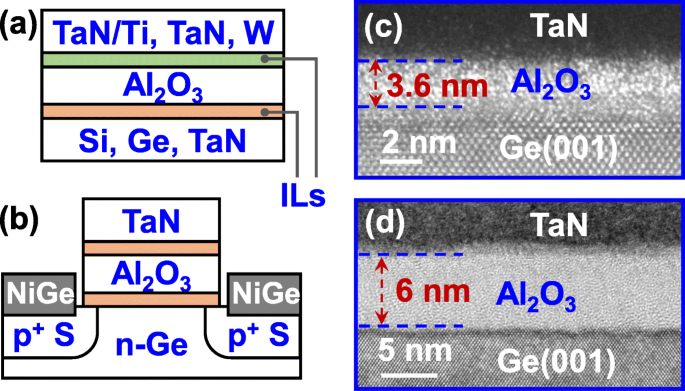
Schema der hergestellten a Al2 O3 Kondensatoren mit verschiedenen Elektroden und b Al2 O3 NVFET. c und d HRTEM-Bilder des hergestellten TaN/Al2 O3 /Ge-Stacks mit verschiedenen t AlO , zeigt das amorphe Al2 O3 Filme nach einem RTA bei 350 °C
Ergebnisse und Diskussion
Abbildung 2 zeigt das gemessene P vs. Spannung V Eigenschaften für das amorphe Al2 O3 Kondensatoren mit unterschiedlichen t AlO und verschiedene obere und untere Elektroden. Die Messfrequenz beträgt 1 kHz. Wie in Abb. 2a–c gezeigt, mit festen 3,6 nm von t AlO , TaN/Al2 O3 /Ge-Kondensator erreicht eine höhere Sättigung P (P Sat ) im Vergleich zu den Geräten mit TaN/Ti- und W-Top-Elektroden. Das ferroelektrische Verhalten korreliert stark mit Grenzflächen, und es wird vermutet, dass die Bildung von TaAlOx IL zwischen TaN und Al2 O3 produziert mehr Sauerstoffleerstellen, was zu einem stärkeren Umschalten von P . beiträgt , verglichen mit dem TiAlOx und WAlOx ILs. P-V Kurven in Abb. 2d zeigen, dass TaN/Al2 O3 /TaN-Kondensator hat einen viel höheren P Sat im Vergleich zu TaN/Al2 O3 /Ge, was darauf zurückgeführt wird, dass duales TaAlOx ILs bieten eine höhere Sauerstoffleerstellenkonzentration. Während P Sat ist im Vergleich zur Ge-Elektrode deutlich niedriger als bei der unteren Elektrode aus Si (Abb. 2e). Dieses Ergebnis zeigt an, dass Al2 O3 Die Qualität der /Si-Grenzfläche ist besser, d. h. weniger Sauerstoff-Leerstellen, verglichen mit der von der Vorrichtung basierend auf einem Ge-Substrat. Abbildung 2f zeigt den P-V Kurven eines TaN/Al2 O3 (6 nm)/Ge-Kondensator mit einem höheren V c und ein fast identisches P Sat im Vergleich zum Gerät mit 3,6 nm Al2 O3 Film in Abb. 2b. Es wird darauf hingewiesen, dass der Grund für das nicht geschlossene P -V Schleifen liegt daran, dass tatsächlich ein Leck vorhanden ist. Es wurde berichtet, dass der große Offset bei einem elektrischen Feld von Null immer bei einem großen Feld auftrat und mit dem kleineren Sweep-Bereich von V . immer allmählich verschwand [11, 12].
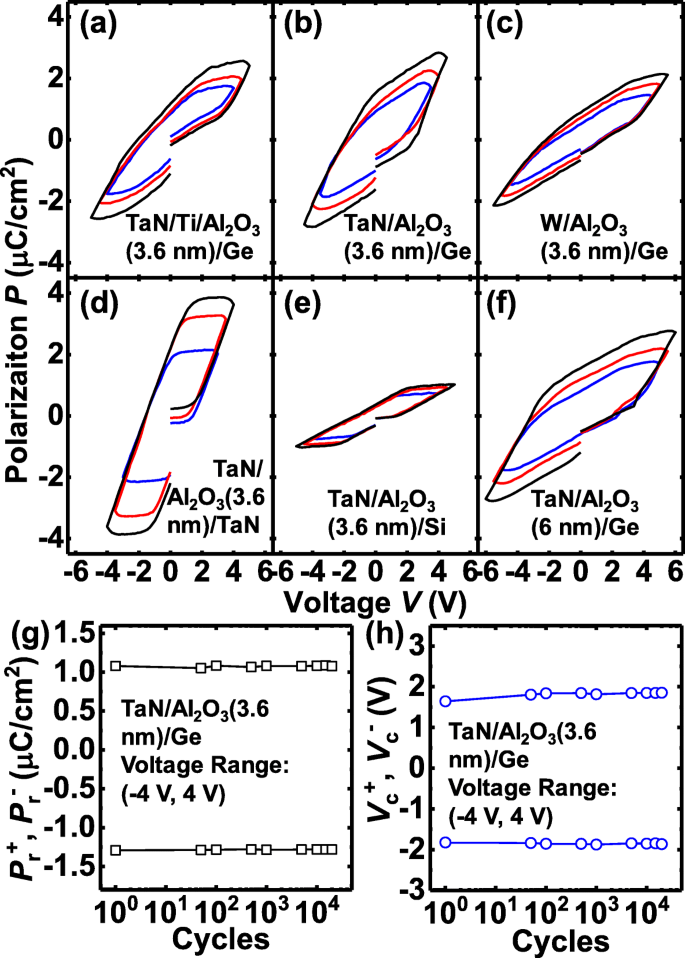
Gemessener P vs. V Eigenschaften des Al2 O3 Kondensatoren mit unterschiedlichen Elektroden. a , b , und c zeigt das P -V Kurven von TaN/Ti/Al2 O3 /Ge, TaN/Al2 O3 /Ge und W/Al2 O3 /Ge bzw. mit einem 3,6-nm-t AlO . d und e zeigt, dass das P Sat wird verbessert (reduziert), indem TaN(Si) als untere Elektrode anstelle von Ge verwendet wird. f TaN/Al2 O3 (6 nm)/Ge-Kondensator hat eine höhere V c und ein ähnliches P Sat im Vergleich zum 3,6-nm-dicken Gerät in b . g und h Ausdauermessungen zeigen keine Verschlechterung von P r und V c beobachtet nach 10 4 Sweep-Zyklen für einen TaN/Al2 O3 (3,6 nm)/Ge-Kondensator
Abbildung 2g und h zeigen die extrahierte Entwicklung des positiven und negativen Rests P (P r ) und Zwang V (V c ) Werte über 10 4 Sweep-Zyklen für einen TaN/Al2 O3 /Ge-Kondensator. Es wird kein Aufwach-, Abdruck- oder Ermüdungseffekt beobachtet. V c des Geräts beträgt ~1,8 V, was darauf hinweist, dass das E in der Al2 O3 Film beträgt 4~6 MV/cm und kann in den ILs 8 MV/cm überschreiten, was hoch genug ist, um die Sauerstoffleerstellen zu treiben [13, 14]. P Sat der Geräte reicht von 1 bis 5 μC/cm 2 , entsprechend einer angemessenen Sauerstoffleerstellenkonzentration im Bereich von 3~15×10 12 cm -2 vorausgesetzt, sie haben eine Ladung von plus zwei.
Der zugrunde liegende Mechanismus für ferroelektrisches Verhalten im Zusammenhang mit Sauerstoffleerstellen in Al2 O3 Geräte diskutiert. Die Migration der spannungsgesteuerten Sauerstoffleerstellen wurde in resistiven Direktzugriffsspeichervorrichtungen umfassend demonstriert [15, 16]. Abbildung 3 zeigt den Schaltplan des schaltbaren P in TaN/Al2 O3 /Ge, das aus der Segregation von spannungsmodulierten Sauerstoffleerstellen und negativen Ladungen zu den elektrischen Dipolen entsteht. Daraus lässt sich schließen, dass die beweglichen Sauerstoffleerstellen hauptsächlich aus der Bildung von TaAlOx . resultieren IL und befinden sich im Ausgangszustand in der Nähe der oberen Grenzfläche (Abb. 3a). Abbildung 3b und c zeigen, wie das positive und negative P werden mit der Modulation der Sauerstoffleerstelle bzw. negativen Ladungsdipole unter der angelegten Spannung gebildet. Röntgenphotoelektronenspektren (XPS) von Al2 O3 /Ge und (Ti, TaN und W)/Al2 O3 /Ge-Proben werden gemessen und in Abb. 4 gezeigt). Für alle Metalle/Al2 O3 /Ge-Proben bildet sich ein Metalloxid IL zwischen Metall und Al2 O3 , die als Reservoir für Sauerstoffionen und Leerstellen vorgeschlagen werden, was mit Lit. [17].
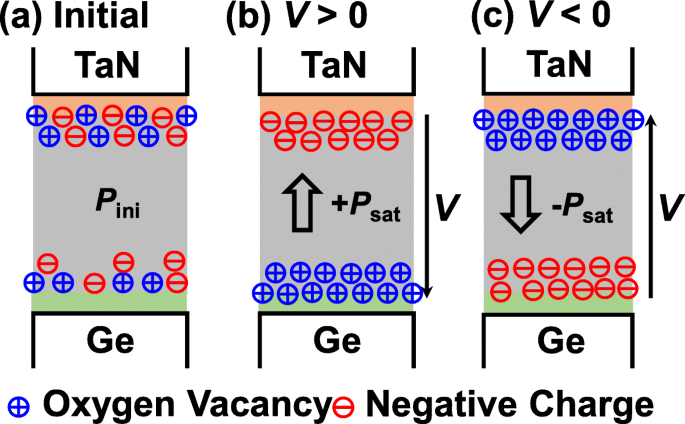
Schematische Darstellung des Mechanismus für ferroelektrisches Verhalten in Al2 O3 Kondensatoren. Umschaltbares P ist auf die Migration von Sauerstoffleerstellen und negativen Ladungen zu Dipolen zurückzuführen

XPS-Spektren auf Kernebene von a Al2 O3 /Ge, b TaN/Al2 O3 /Ge, c Ti/Al2 O3 /Ge und d W/Al2 O3 /Ge-Proben
Zur Charakterisierung der elektrischen Leistung von Al2 O3 NVFET als NVM, Programm-(Lösch-)Betrieb wird durch Anlegen positiver (negativer) Spannungsimpulse an das Gate erreicht, um seine Schwellenspannung (V .) zu erhöhen (zu senken). TH ). Abbildung 5a zeigt, wie die Übertragungseigenschaften des Al2 . im linearen Bereich O3 NVFET-Verschiebung relativ zum anfänglichen I DS -V GS Kurve gemessen mit ±4 V Programmierspannungen (Löschspannungen) mit 100 ns Pulsbreite. Hier, V TH ist definiert als V GS bei 100 nA⋅W/L, und MW ist definiert als die maximale Änderung von V TH . Die Al2 O3 NVFET erreicht ein MW von 0,44 V, obwohl amorphes Al2 O3 Film hat kleinere P r als das berichtete dotierte HfO2 Filme [5, 8]. Es wird darauf hingewiesen, dass die hohe Betriebsfrequenz von bis zu 10 MHz von Al2 O3 NVFET-Speicher, der auf das schaltbare P hinweist in Al2 O3 stammt von der Wanderung von spannungsgesteuerten Sauerstoffleerstellen zur Bildung von Dipolen, nicht von Ladungseinfang/-detrapping-Defekten. An das Al2 . wurden abwechselnd Programmier- und Löschimpulse angelegt O3 Geräte, um die Gerätelebensdauer weiter zu untersuchen. Abbildung 5b zeigt die Diagramme von V TH vs. P/E-Zykluszahl, was darauf hindeutet, dass ein stabiles MW ohne signifikante Verschlechterung über 10 6 . aufrechterhalten werden kann P/E-Zyklen für ein 3,6 nm dickes Al2 O3 NVFET.
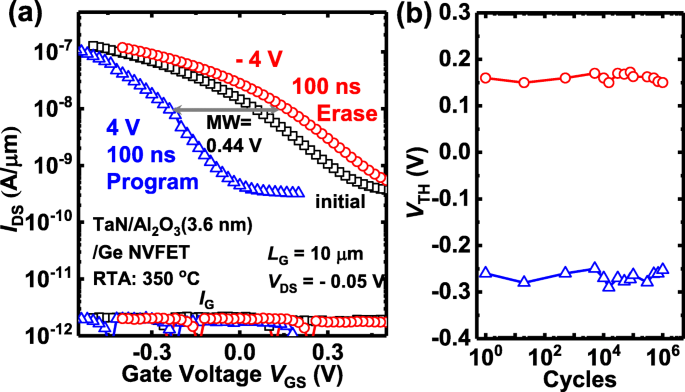
a Gemessen I DS -V GS Kurven eines 3,6 nm dicken Al2 O3 NVFET für den Anfangs- und zwei Polarisationszustände. Es wird ein MW von 0,44 V erhalten. b Die Ausdauermessung zeigt, dass nach 10 6 . kein MW-Abbau beobachtet wird P/E-Zyklen
Bemerkenswert ist das bei amorphem Al2 . beobachtete ferroelektrische Verhalten O3 Geräte können auf die universellen amorphen Oxide erweitert werden, z. B. Hafniumoxid (HfO2 ) und Zirkonoxid (ZrO2 ).
Schlussfolgerungen
Stabiles ferroelektrisches Verhalten wird erstmals in Kondensatoren mit einem dünnen amorphen Al2 . realisiert O3 Isolator. Umschaltbares P in amorphem Al2 O3 Kondensatoren wird durch P-V . demonstriert Schleifen und NVFET-Test. Es wird vermutet, dass das ferroelektrische Verhalten von den Sauerstoffleerstellen an der Grenzfläche und den Ionendipolen herrührt. Das 3,6 nm dicke Al2 O3 NVFET erreicht ein MW von 0,44 V und über 10 6 Zyklenfestigkeit unter ±4 V bei 100 ns P/E-Bedingung. Alles in allem eröffnete diese Arbeit eine neue Welt für ferroelektrische Bauelemente aus amorphen Oxiden, die für Multi-Gate-NVFETs (Flossenform, Nanodraht oder Nanoblatt) mit potenziell nanoskaligem Finnenabstand in VLSI-Systemen vielversprechend sind.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Artikels unterstützen, sind im Artikel enthalten.
Abkürzungen
- Al2 O3 :
-
Aluminiumoxid
- ALD:
-
Atomlagenabscheidung
- BF2 + :
-
Borfluoridion
- E c :
-
Elektrisches Koerzitivfeld
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxid
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- I DS :
-
Strom entziehen
- MOSFETs:
-
Metall-Oxid-Halbleiter-Feldeffekttransistoren
- MW:
-
Speicherfenster
- Ni:
-
Nickel
- NVFET:
-
Nichtflüchtiger Feldeffekttransistor
- P r :
-
Restpolarisation
- P Sat :
-
Sättigungspolarisation
- RTA:
-
Vergütetes thermisches Glühen
- TaAlOx :
-
Tantal-Aluminiumoxid
- t AlO :
-
Korunddicke
- TaN:
-
Tantalnitrid
- V GS :
-
Gate-Spannung
- V TH :
-
Schwellenspannung
- XPS:
-
Röntgenphotoelektronenspektren
Nanomaterialien
- Ein intelligenterer Speicher für IoT-Geräte
- Nichtflüchtige Speicherfamilie erhöht die Dichte
- Verschlusszeittester für Filmkameras
- Antifog-PC-Folie für Visiere, Linsen und Brillen
- Heizungsunterstützte Dielektrophorese für ausgerichtete einwandige Kohlenstoff-Nanoröhren-Filme mit ultrahoher Dichte
- Amorphe Silizium-Nanodrähte, die durch Glühen auf Siliziumoxid-Film gewachsen sind
- Magnetische Kohlenstoff-Mikrosphären als wiederverwendbares Adsorptionsmittel zur Entfernung von Sulfonamid aus Wasser
- Solvay-Folie auf Epoxidbasis für Prepregs
- Sensorfolie für die Luft- und Raumfahrt
- Neue Methode stellt Computerspeicher aus Titanoxid her



