Verkleinerte c-Si- und c-SiGe-Wagenräder zur Visualisierung der Anisotropie und Selektivität nasschemischer Ätzmittel
Zusammenfassung
Nassätzen bietet einen Vorteil als weiches, schadensfreies Verfahren zum Entfernen von Opfermaterial mit einer Genauigkeit von nahezu Nanometern, das für die Herstellung nanoskaliger Strukturen entscheidend geworden ist. Um solche Nassätzlösungen zu entwickeln, ist das Screening von Ätzmitteleigenschaften wie Selektivität und (An)Isotropie von entscheidender Bedeutung geworden. Da diese Ätzmittel typischerweise niedrige Ätzraten aufweisen, sind empfindliche Teststrukturen erforderlich, um ihr Ätzverhalten zu bewerten. Daher wurden verkleinerte einkristalline Si (c-Si) und SiGe (c-SiGe) Wagenräder hergestellt. Erstens die Empfindlichkeit der c-Si-Wagenräder zur Erkennung des anisotropen Verhaltens von kristallinem Silizium in den alkalischen Ätzmitteln TMAH und NH4 OH wurde nachgewiesen. Unterschiedliche Wagenradmuster, die für jedes Material/Ätzmittel-Paar charakteristisch sind, wurden durch Top-Down-Rasterelektronenmikroskopie (REM) nach anisotropem Nassätzen beobachtet. Ähnliche Trends bei den kristallographischen ebenenabhängigen Ätzraten wurden sowohl für Si(100)- als auch für Si(110)-Substrate erhalten. Zweitens das Ätzen von sowohl c-Si als auch c-Si75 Ge25 Wagenräder in einem typischen selektiven Ätzmittel, Peressigsäure (PAA), bewertet. c-Si75 Ge25 Ätzen in PAA führte zu isotropem Ätzen. Die Selektivitätswerte wurden nach zwei Methoden berechnet:zum einen durch Messung des Flankenverlustes der Speichen des Wagenrades, zum zweiten indirekt durch Messung der Speicheneinzugslängen. Beide Verfahren liefern vergleichbare Werte, letzteres ist jedoch erst nach einer gewissen kritischen Ätzzeit anwendbar, nach der sich die Speichenspitzen zu einer scharfen Spitze entwickelt haben.
Einführung
Herkömmlicherweise wurde die allmähliche Zunahme der Dichte von Transistoren auf integrierten Halbleiterschaltkreisen durch Verkleinern der Knotengröße erreicht. Dies ist technisch und wirtschaftlich nicht mehr tragbar. Daher werden neue Feldeffekttransistoren (FET)-Architekturen wie Fin-FET und Gate-Allround-GAA-FET eingeführt [1,2,3]. Letztere bietet gegenüber ersteren einen Vorteil, da ihr Gate den Kanal genauer abstimmen kann [4]. Einige Prozesse, die für die Herstellung dieser komplexen 3D-Merkmale verwendet werden, die in den modernsten FET-Transistoren und Speicherzellen verwendet werden, erfordern extrem selektive und isotrope Ätzmittel [5, 6].
Für die Herstellung von GAA-Architekturen, die einen oder mehrere vertikal gestapelte horizontale kristalline Nanodrähte umfassen, ist ein sehr selektives und isotropes Ätzen der kristallinen Epitaxie-Opferschichten erforderlich. Für die Freisetzung von Si-Nanodrähten wird beispielsweise ein Six Ge1-x Ätzmittel, das die Si-Nanodrähte intakt lässt, ist erforderlich.
Daher ist das Screening und das Verständnis der Ätzmitteleigenschaften von entscheidender Bedeutung. Das Screening von Ätzmitteln auf Blankofilmen gibt keine verlässlichen Informationen über die (An)Isotropie des Material/Ätzmittel-Paares. Die Visualisierung von Anisotropie ist extrem wichtig, da das Ätzen von kristallinen Opferschichten durch die Bildung von langsamen Ätz- oder sogenannten „Blocking“-Ebenen in den seitlichen Gräben verzögert oder sogar gestoppt werden kann. Anisotropie wurde auch intensiv für die Herstellung mikroelektromechanischer Strukturen (MEMS) [7, 8] und für die Oberflächentexturierung von Si in Solaranwendungen [9,10,11] untersucht.
Grundsätzlich wurden zwei experimentelle Methoden verwendet, die beide Ätzraten als Funktion der kristallographischen Richtungen von Si liefern. Im ersten wird eine Siliziumkugel oder Halbkugel mit einem Durchmesser von einigen Millimetern geätzt; Anisotropie führt zur Facettenbildung, die, einmal quantifiziert, die Ätzraten der verschiedenen Kristallebenen liefert [12,13,14]. Bei der zweiten und am weitesten verbreiteten Methode werden Siliziumspeichen oder -gräben auf einem Wafer radial strukturiert, wodurch die sogenannte Wagenradform entsteht [15, 16]. Die Stärke der letztgenannten Methode liegt darin, dass viele kristallographische Flächen in einem einzigen Nassätzen untersucht werden können und in ihrem Verstärkungseffekt. Während des anisotropen Nassätzens zieht sich die Spitze der Speichen mit einer Rate proportional zur Ätzrate der Seitenwand der Wagenradspeiche zurück, wobei letztere die interessierende Ätzrate ist. Aufgrund der Speichengeometrie ist die Rückzugsgeschwindigkeit der Speichenspitze deutlich höher als die reale Ätzrate der Seitenwände. Diese relativ große Einfahrlänge ist somit leichter zu visualisieren und zu quantifizieren als die geringe Seitenwandverdünnung der Speichen. Der Verstärkungsfaktor hängt von der geometrischen Anordnung der Speichen in einem Wagenrad ab. Wagenräder mit mehr Speichen und damit kleineren Winkeln haben größere Verstärkungsfaktoren. Die in der Literatur [15,16,17,18] beschriebenen Wagenräder haben Durchmesser von cm und können typischerweise 180 Speichen mit einer Winkelbreite und einem Abstand von 1° aufnehmen, was zu Verstärkungsfaktoren von 115 führt. Für die meisten Anwendungen sind hohe Ätzraten gewünscht; Daher haben die meisten Autoren das anisotrope Ätzen von Silizium in relativ heißen (~ 60–80 °C) und relativ konzentrierten (~ 12–25 Gew.-%) alkalischen TMAH- und KOH-Lösungen untersucht. Über anisotropes Ätzen in alkalischen Lösungen niedriger Konzentration und noch weniger bei niedriger Temperatur ist jedoch wenig bekannt. Außerdem ist die meiste Zeit nur ein Nanometer-Entfernen von Halbleitermaterial während des Herstellungsprozesses von nm-großen Strukturen in den fortschrittlichsten komplementären Metalloxid-Halbleiter-(CMOS)-Anwendungen erforderlich. Daher werden für die meisten Nassätzprozesse, die bei der sehr großen Integration (VLSI) verwendet werden, viel niedrigere Nassätzraten im Bereich von einigen Nanometern/min benötigt. Daher schlagen wir die Miniaturisierung der vorherigen Generation von Wagenrädern vor.
In dieser Arbeit wurden nicht nur verkleinerte c-Si sondern auch c-SiGe Wagenräder hergestellt. Somit können sowohl die Isotropie- als auch die Selektivitätsanforderungen von Ätzmitteln gleichzeitig mit hoher Genauigkeit bewertet werden. Da der Hauptvorteil der Wagenrad-Technik immer noch die Bestimmung des Anisotropiegrades von Material/Ätzmittel-Paaren ist, werden wir unsere Ergebnisse zunächst mit denen an cm-großen Wagenrädern in früheren Studien vergleichen. Anschließend werden wir den Nutzen dieser Technik für die Entwicklung von selektiven und isotropen Ätzmitteln veranschaulichen, insbesondere für das selektive Ätzen von c-Si75 . Ge25 bezüglich c-Si.
Experimentelles/Methoden
Wagenrad-Design
Die Abmessungen der Wagenräder wurden mit dem Gedanken gewählt, Nanometer observe zu beobachten -Bereichsseitenwandverlust, der zu sub . führt -Mikron Rückzugslängen. Die Abmessungen der Wagenräder basieren auf einem Gleichgewicht zwischen den folgenden drei Grenzen:
- 1.
Die photolithographische Technik, die eine Beschränkung auf die minimale kritische Dimension (CD) festlegt, die die Speichenbreite des Wagenrads (innere) ist.
- 2.
Die Bildgebungstechnik, die ein maximales praktisches Sichtfeld (FoV) und damit einen maximalen Wagenraddurchmesser definiert.
- 3.
Die maximale Anzahl von Speichen, die im kreisförmigen Wagenradmuster angeordnet werden können, oder dementsprechend der minimale Speichenkeilwinkel, der den maximalen Verstärkungsfaktor definiert.
Vor diesem Hintergrund wurde die innere Speichenbreite auf 90 nm (CD), der Wagenraddurchmesser auf 3,8 µm (FoV) festgelegt und 32 Speichen in einem kreisförmigen Muster angeordnet. Bei dieser Wagenradkonstruktion ergeben sich Speichenwinkel von 5,6° und ein Verstärkungsfaktor von ca. 20. Hierfür wurde eine eigene Maske entworfen (Abb. 1a). Die Abmessungen werden mit denen von vorgefertigten Wagenrädern von Wind et al. verglichen. (siehe Tabelle 1). Die Wagenräder werden in vertikaler und horizontaler Richtung mit einer Teilung von 3,9 µm ausgerichtet, wobei zwischen zwei Wagenrädern 100 nm Platz bleiben (Abb. 1b). Die Herstellung dieser Wagenräder wird im nächsten Abschnitt beschrieben.
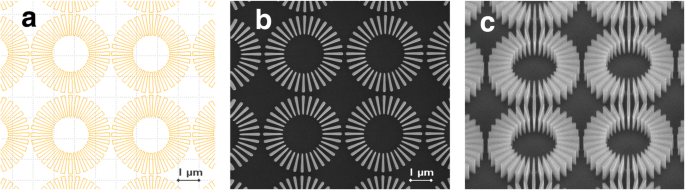
Wagenräder wie auf der Maske entworfen (a ) und nach dem Nanofabrikationsprozess:Draufsicht SEM (b ), Schrägansicht SEM (c )
Wagenradfertigung
Wagenräder aus kristallinem Silizium (c-Si) wurden auf standardmäßigen p-Typ (B-dotiert, 1–100 Ohm cm) 300 mm Si(100) und Si(110) Wafern hergestellt. Der Strukturierungsprozess bestand aus der Abscheidung eines Hartmaskenstapels, bestehend aus (von oben nach unten) 30 nm Siliziumnitrid, 160 nm amorphem Kohlenstoff (APF), 20 nm Siliziumnitrid und 30 nm amorphem Si. Eine 193-nm-Immersionslithographie wurde verwendet, um das Muster in den Photoresist zu übertragen. Nachdem der Fotolack entwickelt war, wurde das Wagenradmuster unter Verwendung einer Plasmaätzung geätzt, die einen Fotolack und einen APF-Streifen umfasste. Die untere Schicht des Hartmaskenstapels, die SiN-Schicht, wurde mit heißer Phosphorsäure (6 min. 85 Gew.% H3 .) entfernt PO4 bei 160 °C) oder Flusssäure (5 min 10 Gew.% HF). Abbildung 1c zeigt eine geneigte REM-Ansicht der hergestellten Wagenräder.
Kristalline Silizium-Germanium-Wagenräder (c-Si75 Ge25 ) wurden auch auf standardmäßigen p-Typ (B-dotiert, 1–100 Ohm cm) 300 mm Si(100)- oder Si(110)-Wafern hergestellt. Vor der Strukturierung wird eine Schicht von ungefähr 600 nm undotiertem Si75 Ge25 epitaktisch abgeschieden wurde. Danach wurden die gleichen Musterungsschritte wie bei den Si-Wagenrädern durchgeführt, was zu c-Si75 . führte Ge25 Wagenradspeichen.
(An)isotrope Nassätzexperimente
Vor den (an)isotropen Nassätztests ist eine SPM-Reinigung (5 min H2 SO4 :H2 O2 3:1 bei 60 °C) zur Entfernung organischer Rückstände durchgeführt und anschließend die Oxidschicht während eines 2-minütigen Eintauchens in wässrige 1 Gew.% HF-Lösung entfernt. Unmittelbar nach den SPM- und HF-Reinigungsprozessen wird die Ätzmittelanisotropie untersucht, indem das Testmuster in eine ungerührte Probe des Ätzmittels bei Raumtemperatur (RT) gelegt wird. TMAH und NH4 OH-Ätzlösungen wurden durch Verdünnung von 25 Gew.% TMAH oder 29 Gew.% NH4 . hergestellt OH. Die Peressigsäure (PAA)-Lösungen wurden durch Mischen von 9,5 Teilen H2 . hergestellt O2 (30 Gew.-%), 11 Teile Essigsäure (98 Gew.-%) und 0,1 Teile HF (49 Gew.-%). Diese Ätzlösung ist dafür bekannt, selektiv Six . zu ätzen Ge1-x Legierungen über reinem Si [19, 20]. PAA, das als oxidierende Spezies für das SiGe-Ätzen dient, wird durch Reaktion der Essigsäure mit dem Peroxid mit HF als Katalysator gebildet. Es wird jedoch eine gewisse Zeit benötigt, um ein Gleichgewicht zu erreichen; daher wurden die Lösungen 1 Woche gealtert. Die Anisotropie und Selektivität des Ätzmittels wurde untersucht, indem die Testmuster in eine ungerührte Probe des Ätzmittels bei RT gegeben wurden. Unmittelbar nach dem Ätzen wurden die Proben 30 s in entionisiertem Wasser gespült und anschließend mit Stickstoffgas getrocknet.
Ergebnisse und Diskussion
Anisotropes Ätzen von c-Si(100) und c-Si(110) Waggonrädern in TMAH
Wenn auf einem Si(100)-Wafer hergestellte Silizium-Wagenräder in niedrig konzentriertem TMAH (5 Gew.-%) bei RT geätzt werden, können folgende Beobachtungen gemacht werden (Abb. 2):Erstens die charakteristische vierzählige Symmetrie eines Si (100)-Wafer wird durch das anisotrope Ätzen des Wagenrads freigelegt. Zweitens kann die orientierungsabhängige Ätzrate verschiedener kristallographischer Ebenen visuell abgeleitet werden:Die relativ schnell ätzenden Speichen der Wagenräder sind diejenigen, die durch {110} und vicinale {110} Seitenwandebenen definiert sind, während die langsameren Ätzspeichen definiert sind durch die {100} und vicinalen {100} Seitenwandebenen. Neben dieser Hauptbeobachtung, dass die Ätzratenordnung von Si in niedriger Konzentration und RT TMAH folgt R (110)> R (100) , konnten andere anisotrope Effekte festgestellt werden:zum Beispiel sind die vier Speichen, die den vier {110}-Ebenen entsprechen, nicht die am schnellsten ätzenden Speichen, das sind genauer gesagt jeweils die beiden vicinalen Speichen dieser {110}-Ebenen. Dementsprechend wird die Ätzrate um {110} in zwei äquivalente Maxima aufgeteilt, und die {110}-Ebenen sind lokale Minima. Dies entspricht ähnlichen Beobachtungen von [21,22,23], wobei die niedrigere Ätzrate der {110}-Ebenen einem Blockierungseffekt durch das TMA + . zugeschrieben wird Ionen.

a TD-REM eines Si(100)-Wagenrads, geätzt in niedrig konzentriertem TMAH (5 Gew.-%) bei RT und Zoom-in (b ) zeigt die Entwicklung der schneller ätzenden {110}-Ebenen/Facetten, wie durch die gestrichelten Linien angezeigt
Ein weiteres Ergebnis des anisotropen Ätzens ist die besondere Form der äußeren Speichenenden der vier {100} Speichen. Es ist bekannt, dass die schnellsten Bei konvexen Oberflächen werden Ätzebenen sichtbar. Anfänglich sind die Speichenenden konvexe Oberflächen, folglich werden nach einer gewissen Ätzzeit die schneller ätzenden {110}-Ebenen freigelegt, die Facetten an den äußeren Speichenenden bilden. Dies ist am deutlichsten bei den Speichen entlang der <100>-Richtungen (Vergrößerung b in Abb. 2).
Für ein konkaves Oberfläche jedoch am langsamsten Ätzebenen werden aufgedeckt. Beim Ätzen der Wagenradspeichen wird auch das die Speichen umgebende Si(100)-Substrat geätzt. Dieser Basis-Substrat-Übergang ist eine konkave Oberfläche; daher sollten die langsamsten Ätzebenen, nämlich die {111}-Ebenen, aufgedeckt werden. Diese {111}-Ebenen erscheinen mit den <110>-Richtungen für Si(100)-Substrate ausgerichtet. Tatsächlich ist in Fig. 3b zu sehen, dass die {111}-Ebenen nach dem Ätzen in TMAH freigelegt wurden und eine Basis mit schrägen {111}-Ebenen für alle Speichen entlang der <110>-Richtungen bildeten.
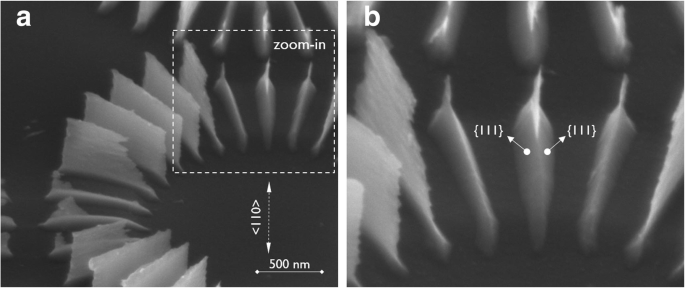
a Schräge REM-Aufnahme eines Si(100)-Wagenrads, geätzt in niedrig konzentriertem TMAH (5 Gew.-%) bei RT und Zoom-in (b ) zeigt die schrägen {111} Ebenen
Ähnlich wie die Si(100)-Wagenräder wurden Si(110)-Wagenräder in niedrig konzentriertem TMAH (5 Gew.-%) bei RT geätzt. Anstelle der vierzähligen Symmetrie eines Si(100)-Wafers zeigt sich die zweizählige Symmetrie des Si(110). Die kristallographischen Orientierungen einiger der {100}-, {110}-, {111}- und {211}-Ebenen sind in Fig. 4a zugeordnet. Einer der Vorteile der Verwendung von Si(110)-Substraten zur Bewertung der Anisotropie ist das Vorhandensein vertikaler {111}-Ebenen, die durch die Seitenwände der {111}-Speichen der Wagenräder repräsentiert werden. Wie in Fig. 4 zu sehen ist, sind dies die langsamsten Ätzebenen. Die schnellsten Ätzebenen scheinen die {110}- und die {211}-Ebene zu sein. Für die {100}-Ebenen werden mittlere Ätzraten gefunden. Daher R (110) ~ R (211)> R (100)> R (111) , in Übereinstimmung mit den Ergebnissen, die auf Si(100) erhalten wurden.
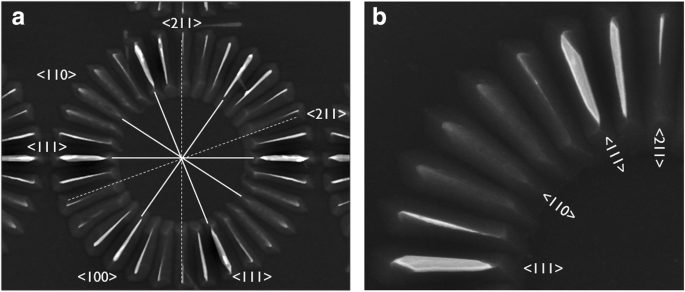
a TD-REM eines Si(110) Wagenrades, geätzt in niedrig konzentriertem TMAH (5 Gew.%) bei RT und Zoom-in (b ) zeigt die Facettenbildung an den <111> orientierten Speichen. Die kristallographischen Hauptrichtungen (oder äquivalente Ebenen) sind durch durchgezogene Linien dargestellt, die Ebenen mit höherem Index durch gestrichelte Linien
In 4b ist zu sehen, dass sich die Enden der am langsamsten ätzenden {111}-Speichen von einer abgerundeten Form zu einer pfeilähnlichen Form entwickeln, wodurch ein asymmetrisches Parallelogramm gebildet wird. Die zugrunde liegende Ursache für die Bildung dieser Facetten ist das schnellere Ätzen der {110}- und {211}-Ebenen.
TMAH- und TMAH/IPA-Mischungen sind gut untersuchte und häufig verwendete Ätzmittel für die Herstellung von MEMS-Strukturen, für die hohe Ätzraten und eine Abstimmung der Anisotropie erforderlich sind. Dementsprechend wurden die meisten Untersuchungen zum Si-Ätzen in TMAH bei höheren Temperaturen und Konzentrationen durchgeführt. Typische Konzentrationen reichen von 10 bis 25 Gew.% TMAH und bei Temperaturen von 60 bis 90 °C [12,13,14, 23]. Einige Forschungsgruppen führten Ätztests bei niedrigen Konzentrationen um 5 Gew.% durch, wie in unserer Arbeit, aber sie verwendeten immer noch hohe Temperaturen von 60–90 °C [24,25,26]. Die R (110) /R (100) Das Verhältnis liegt bei hohen Konzentrationen und hohen Temperaturen typischerweise bei etwa 2 und scheint mit Abnahme zuzunehmen TMAH-Temperatur (Zusätzliche Datei 1:S1). Da sich diese Studie auf nanoskalige Ätzanwendungen konzentriert, werden keine hohen Ätzraten angestrebt. Daher wurden niedrige (RT) Temperaturen gewählt, um ein akzeptables Zeitfenster für die Beobachtung von Ätzphänomenen zu haben und eine vollständige Auflösung von Strukturen zu vermeiden. Die gleiche Geschwindigkeitsordnung, R (110)> R (100) , wird in dieser Studie bei RT und 5 Gew.% TMAH beobachtet, aber die berechneten Werte des R (110) /R (100) Verhältnis deutlich über 2 liegen (siehe auch Lit. [27]). Dies bestätigt somit den Trend, dass dieses anisotrope Verhältnis mit Abnahme zunimmt TMAH-Temperatur. Eine detaillierte mechanistische Erklärung dieser Beobachtung, einschließlich kinetischer und atomistischer Aspekte, würde den Rahmen dieser Arbeit sprengen. Basierend auf den obigen Vergleichen für das Ätzen von Silizium in TMAH kann jedoch geschlossen werden, dass die verkleinerten Wagenräder die erforderliche Empfindlichkeit bieten, um das anisotrope Verhalten von Ätzmitteln zu erkennen und zu vergleichen.
Anisotropes Ätzen von c-Si(100) und c-Si(110) Waggonrädern in NH4 OH
Si(100)-Wagenräder sowie Si(110)-Wagenräder wurden in niedrig konzentriertem (0,4 Gew.-%) Ammoniumhydroxid (NH4 .) geätzt OH) bei RT. Im ersteren (Abb. 5, links) zeigt sich die vierzählige Symmetrie eines Si(100)-Wafers. Es ist klar, dass die Speichen entlang der <210>- und <310>-Richtungen, die theoretisch bei 18,4° und 26,6° in Bezug auf die <110>-Richtungen liegen, am besten durch die dritte Speiche repräsentiert werden (von der oberen 'nördlichen' Speiche gezählt) ) mit Seitenwänden bei 19,7° und 25,3°, sind die am schnellsten ätzenden Speichen. Die {110}-Speichen ätzen im Vergleich zu {100} langsamer und an den äußeren Enden dieser Speichen entwickeln sich Facetten. Diese Facetten sind wahrscheinlich die schnell ätzenden {210}- und {310}-Ebenen und können zu einer insgesamt schnelleren scheinbaren Ätzrate der {110}-Speichen beitragen, insbesondere bei längeren Ätzzeiten. Somit folgt die beobachtete Ätzrate R (310) ~ R (210)> R (100) ~ R (110) .

TD-REM-Aufnahme eines Si(100) (links) und eines Si(110) Wagenrads (rechts), geätzt in niedrig konzentriertem NH4OH (0,4 Gew.-%) bei RT. Spezifische kristallographische Richtungen werden durch [ ] repräsentiert, eine Familie äquivalenter Richtungen durch <>. Die kristallographischen Hauptrichtungen (oder äquivalente Ebenen) sind durch durchgezogene Linien dargestellt, die Ebenen mit höherem Index durch gestrichelte Linien
Bei den Si(110)-Wagenrädern (Abb. 5, rechts) wird die zweifache Symmetrie um die (100)- und (110)-Ebene durch anisotropes Ätzen in NH4 . sichtbar OH. Die Speichen entlang der <111>-Richtungen mit {111}-Seitenwänden erscheinen als die am langsamsten ätzenden Speichen oder Ebenen. Die am schnellsten ätzenden Speichen werden durch die {211}- und {311}-Ebenen mit hohem Index definiert. {110} und {100} haben mittlere Ätzraten. Daher stimmen die Si(110)-Ergebnisse mit den Si(100)-Ergebnissen in NH4 . überein OH. Auch bei den Si(110)-Wagenrädern ist eine Facettierung der Speichen erkennbar, insbesondere an den äußeren Enden der {111}- und {100}-Speichen. Die Facetten sind wahrscheinlich die Entwicklung der schnelleren Ätzebenen {211} und {311}.
In der Literatur sind nur begrenzte Informationen zur Ätzratenanisotropie von NH4 . verfügbar OH. Wässrige Lösungen von NH4 OH wurden auch als anisotrope Ätzmittel verwendet [28] mit ähnlichen Eigenschaften wie andere OH - mit Si-Ätzmitteln. Der Vorteil ist, dass es keine Metalle enthält (wie K + , Na + , Cs + , ...). Daher NH4 OH ist ein IC-kompatibles Ätzmittel, das untersucht werden sollte. Schnakenberget al. zeigte, dass die R (111) /R (100) Ätzratenverhältnis für ein Ätzmuster vom Wagenradtyp, das in 3,7 Gew.-% NH4 . geätzt wurde OH bei 75 °C beträgt ungefähr 0,04 und der R (110) /R (100) Ätzratenverhältnis 0,3 [28]. Das spätere Ergebnis lässt sich gut mit unserem geschätzten Ätzratenverhältnis von 0,5 für R . vergleichen (110) /R (100) .
Aus unseren Ergebnissen ist klar, dass das Ätzen von Si in NH4 OH liefert im Vergleich zu TMAH unterschiedliche Wagenrad-Ätzmuster. Obwohl es einen kleinen Unterschied in der [OH − ] für beide Ätzlösungen (~ 0,12 M vs. ~ 0,55 M), sowohl das Ätzen in TMAH als auch in NH4 OH wurden bei der gleichen Temperatur (RT) durchgeführt. Der einzige verbleibende Unterschied ist das Gegenkation:das sperrigere (CH3 )4 N + im Vergleich zum kleineren NH4 + Kation. Es wurde darauf hingewiesen, dass Kationen in der Ätzlösung an der Oberfläche haften könnten, wodurch selektiv verschiedene Hydroxyl-terminierte Si-Oberflächenstellen blockiert werden, die mit den verschiedenen Ätzebenen assoziiert sind [29, 30]. Immer wenn die Ätzraten verschiedener Ebenen unterschiedlich beeinflusst werden, ändert sich die Anisotropie.
Selektives Ätzen von Si75 Ge25 Richtung Si
In diesem Abschnitt werden wir das Potenzial der verkleinerten Wagenräder für die Bewertung der Ätzrate und Selektivität von Ätzmitteln demonstrieren und diskutieren. Das Si/Si75 Ge25 Paar wurde als Modellsystem gewählt, da es repräsentativ für die Bildung von GAA-Strukturen ist, wobei das Opfer c-Si75 Ge25 Zwischenschichten sollten isotrop und selektiv zu den c-Si-Nanodrähten geätzt werden. Das Ätzen wird in einem selektiven Ätzmittel durchgeführt, das aus einer Mischung aus HF, H2 . hergestellt wird O2 , und CH3 COOH. Es ist bekannt, dass diese Mischung Peressigsäure (CH3 CO3 H) aufgrund der säurekatalysierten Reaktion zwischen dem Peroxid und der Essigsäure [31, 32]. Nach einer gewissen Alterungszeit werden die Gleichgewichtskonzentrationen erreicht. Das so gebildete PAA ist ein wirksames und selektives Oxidationsmittel von Si75 Ge25 . Nach der selektiven Oxidation von SiGe werden die SiGe-Oxide durch HF in einer zweiten, diffusionsbegrenzten Reaktion aufgelöst.
c-Si75 Ge25 Wagenradproben wurden für längere Zeit (t 0 + 30 s, + 60 s, ...+ 180 s) und die Ätzung der Wagenradspeichen wurde durch anschließende Top-Down-REM-Messungen überwacht. Die Breiten der Speichen können mit unserem konventionellen REM zuverlässig gemessen werden, wenn sie nicht kleiner als 10 nm sind. Die Ergebnisse sind in der Zeitreihe in Abb. 6 dargestellt. Zunächst werden die Wagenradspeichen durch das Ätzen ihrer Flanken ausgedünnt. Alle Si75 Ge25 Speichen werden gleichmäßig ausgedünnt, was beweist, dass die Ätzung isotrop ist. Nach ca. 90 s beginnen sich die Speichenspitzen zurückzuziehen, was auf die Einleitung des Verstärkungseffekts hindeutet. Wir beobachten, dass sich dieser Verstärkungseffekt erst manifestiert, nachdem sich die Speichenspitzen zu einer scharfen Spitze entwickelt haben. Bei t 0 , die Speichenspitzen sind noch abgerundet. Aufgrund der allmählich konvergierenden Seitenwände während der anfänglichen Ätzphase der Speichen (t <90 s), verwandelt sich die abgerundete Spitze in eine lediglich scharfe Spitze und die Speichen beginnen sich einzufahren (siehe auch Zusatzdatei 1:S2). Dieser Befund wird für die Wagenrad-Speichenform bei t . deutlich veranschaulicht =180 s:Etwa die Hälfte der Speiche wurde durch das Zurückziehen der Spitze geätzt (∆l beträgt etwa 450 nm). Allerdings bleibt zumindest am breitesten Ende der Speichen noch etwas SiGe übrig, da sich die Seitenwände auf beiden Seiten nur um einen Betrag ∆w~∆l/20 =22,5 nm zurückgezogen haben. Folglich ist nach einer kritischen Zeit (t krit ), kann die Retraktionslänge (∆l) verwendet werden, um indirekt die Ätzrate des Si75 . zu berechnen Ge25 Speichen. Vorher jedoch t krit , kann die Ätzrate nur durch direkte Messung des Seitenwandverlusts (∆w) berechnet werden, der schwer zu messen ist. Ein Vergleich der Ätzraten von Si und SiGe in PAA, die durch direkte Messung des Seitenwandverlusts und indirekte Messung des Speichenrückzugs erhalten wurden, ist in Tabelle 2 gezeigt Steigung der zunehmenden Speicheneinziehlängen gegenüber der Zeit. Letztere Steigung wurde mit den Datenpunkten nach t . berechnet krit wie in Abb. 7 gezeigt. Die Seitenwandbreiten scheinen linear abzunehmen, zumindest bis zur Beobachtungsgrenze unseres konventionellen REM, die bei ungefähr 10 nm liegt. Bis zu diesen Strukturgrößen konnten wir beim allmählichen Ausdünnen der Speichen keine auffälligen Änderungen der Ätzrate feststellen (Abb. 7 und 9).

Ätzen von Zeitreihen von Si75Ge25(100) Wagenrädern in PAA-Lösung
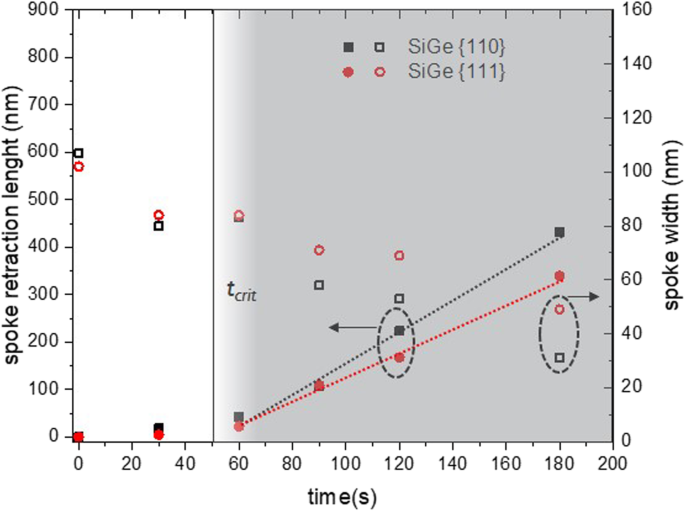
Ätzen von Si75Ge25-Speichen:Die Speichenbreite nimmt allmählich ab, aber erst ab einem gewissen tkrit. beginnen die Speichenspitzen einzuziehen und die gemessenen Einziehlängen können Si75Ge25 linear a.f.o. Ätzzeit (grauer Bereich)
Neben der Erzielung von Ätzraten für das SiGe-Ätzmittel haben wir das isotrope Verhalten des Ätzmittels verifiziert. Es ist klar, dass alle unterschiedlich orientierten Speichen mit der gleichen Ätzrate, d. h. isotrop, ätzen. Dies weist somit auf ein Verfahren hin, dessen Reaktionsgeschwindigkeit durch die Oxidauflösungsgeschwindigkeit und nicht durch das Si75 . gesteuert wird Ge25 Oxidationsrate. Die Oxidauflösung ist diffusionsbegrenzt, mit niedrigen Aktivierungsenergien und neigt nicht zu anisotropem Verhalten.
Ergebnisse für c-Si75 Ge25 (100) Wagenräder wurden mit c-Si75 . validiert Ge25 (110) Wagenräder. Wie für die Silizium-Wagenräder erklärt, ist ein Vorteil der Verwendung von (110)-Substraten das zusätzliche Vorhandensein von vertikalen {111}-Ebenen, die durch die Seitenwände der {111}-Speichen der Wagenräder repräsentiert werden. Dies sind typischerweise die langsamsten Ätzebenen/-Speichen; Daher ist eine sorgfältige Beobachtung dieser Speichen für ein vollständiges Bild der Anisotropie des Si75 . erforderlich Ge25 -PAA-Ätzmittelpaar. Die Ergebnisse (siehe Zusatzdatei 1:S3.1) stimmen mit den Ätzergebnissen der Si75 . überein Ge25 (100) Wagenräder (Abb. 6). Das Ätzen schritt allmählich voran, zuerst durch Ausdünnen, gefolgt von Zurückziehen der Speichenspitze. Bei der längsten Ätzzeit (t =180s). Da jedoch kein eindeutiger Trend, d. h. eine spezifische Winkelabhängigkeit von ∆l, erkennbar ist, wurde dies nicht auf Anisotropie zurückgeführt. Wir führen dies lediglich auf eine größere Variation (Inter- und Intra-Speichen) der Speichenbreiten nach der Fertigung zurück. Tatsächlich ist es bereits im Referenzbild zu sehen (t 0 ), dass die Seitenwände nicht ganz gerade sind. Diese Seitenwandrauhigkeit ist wahrscheinlich auf Relaxationsdefekte des epitaktisch abgeschiedenen Si75 . zurückzuführen Ge25 Schicht auf einem (110)-Substrat. Zusammenfassend lässt sich sagen, dass sowohl c-Si75 Ge25 (100) und (110) Wagenräder werden in der PAA-Lösung isotrop geätzt, was für die schnelle und vollständige Entfernung von c-Si75 . von Vorteil ist Ge25 , als Opfermaterial verwendet, da es nicht dazu neigt, Blockierungsebenen zu bilden.
Das Nassätzen in PAA wurde für c-Si-Wagenräder wiederholt. Der Zweck dieser Tests besteht darin, die Selektivität der Ätzlösung gegenüber Silizium zu überprüfen. Die Proben wurden für längere Zeit (t .) in eine identische PAA-Lösung getaucht 0 + 15 min, + 30 min, ...+ 90 min). Beachten Sie, dass die Ätzzeiten in Minuten angegeben sind und nicht in Sekunden wie beim Si75 Ge25 Wagenräder. Diese verlängerten Ätzzeiten sollen jede Si-Ätzung beobachten, selbst wenn der Zweck dieses Ätzmittels darin besteht, das Silizium zu erhalten.
Obwohl die Ätzzeiten unterschiedlich waren, ist eine ähnliche Beobachtung wie beim Si75 Ge25 Wagenradspeichen:Die Siliziumspeichen werden aufgrund ihrer relativ langsamen Seitenwandätzung zunächst allmählich dünner, dann nach einiger Zeit t krit , hier beginnen sich die Speichen nach ca. 45 min durch den Verstärkungseffekt relativ schnell zurückzuziehen (Abb. 8 und 9). In allen Fällen erscheint die Ätzung isotrop. Die mit c-Si(100)-Wagenrädern erhaltenen Zeitreihen (siehe Zusatzdatei 1:S3.2) stimmen mit den mit den c-Si(110)-Wagenrädern erhaltenen Zeitreihen überein (Abb. 8).

Ätzen von Zeitreihen von Si(110) Wagenrädern in PAA-Lösung. Beachten Sie die etwas langsamere Ätzrate der <111> Speichen im Vergleich zu den anderen Richtungen, die am besten im Bild t . zu erkennen ist 0 + 90 Min. und durch gestrichelte Linien gekennzeichnet
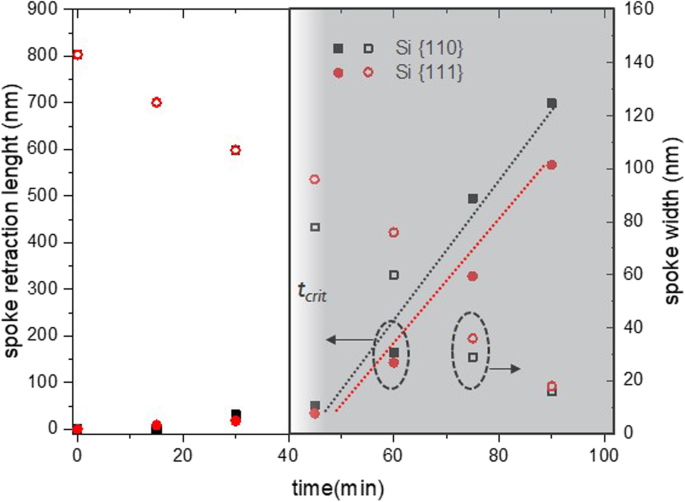
Etching of Si spokes:the spoke width decreases gradually, but only after a certain tcrit., the spoke tips start to retract, and the measured retraction lengths can be fitted linearly a.f.o. etching time (gray-shaded area)
Calculated etch rates are shown in Table 2. Both measurement methods give comparable etching rates with only a 7% and 4% difference in the etch rate values of the {111} and {110} planes, respectively. The values of the Si etching rate are all < 1 nm/min. Holländer et al. measured Si(100) etch rates of ~ 10 nm/min with HF:H2 O2 :CH3 COOH 1:2:3 with a HF concentration of 1.6 wt.% and Wieser et al. measured etch rates of ~ 3 and 5 nm/min for undoped Si(111) and Si(100), respectively with BHF:H2 O2 :CH3 COOH 1:2:3 solutions with a HF concentration of 1 wt.% [33, 34]. Our values compare well with those reported values, considering that the HF concentration in our tests are lower ([HF] =0.25 wt.%). Our results also suggest a slightly lower etching rate of the {111} planes, measured on Si(110) substrates, compared to the {110} planes, measured on Si(100) substrates. These quantitative results point toward a very low etching anisotropy of Si in PAA which is hardly observable by the top-down SEM images. For the sake of clarity, the {111} planes of the wagon-wheel at t 0 + 90 min in Fig. 8 are indicated and it can be noticed that the {111} spokes are slightly broader and longer than the surrounding spokes. This demonstrates again that these scaled-down wagon-wheels are sensitive to detect very faint differences in the crystallographic plane-dependent etch rates (‘anisotropy’) of etchants.
The selectivity ratios of the Si75 Ge25 /Si pair in PAA were extracted from the etching rates in Table 2. The selectivity ratios of Si75 Ge25 (111)/Si(111) range between 11.0 and 12.6 while the Si75 Ge25 (110)/Si(110) ratios are slightly higher, between 14.2 and 16.8. These values are slightly lower than the reported values from Holländer et al. who claim selectivities around ~ 20 [33]. This can be attributed to the higher SiGe etch rates (11–17 nm/min) due to the dynamic process conditions (wafer rotation) in contrast to our static process conditions (no stirring) in which case the SiGe etch rates were ranging between 7.8 and 12.3 nm/min. Interestingly, this confirms the observed isotropic etching of SiGe in PAA:since the reaction rate is kinetically controlled (by stirring or rotation), the rate determining step (RDS) is most probably the diffusion controlled SiGe-oxide dissolution by HF.
Schlussfolgerungen
Scaled-down wagon-wheels with a diameter of 4 μm and 32 spokes exposing the different crystallographic planes were fabricated on 300-mm-diameter wafers. The structures were patterned on Si(100), Si(110), Si75 Ge25 (100), and Si75 Ge25 (110) substrates allowing the observation of the etching of the three main crystallographic orientations of c-Si and c-Si75 Ge25 ({111}, {110}, and {100}) as well as higher index planes. The structures proved to be valuable for the evaluation of the isotropic or anisotropic behavior of etchants by simple inspection by TD SEM. Various alkaline as well as acidic etchants were evaluated by image analysis of their characteristic wagon-wheel etching pattern. Trends in etching ratios were in good agreement with previous works. In TMAH, the plane-dependent etching rate of silicon follows the order:R (110) ~ R (211)> R (100)> R (111) . In NH4 OH, on the other hand, the etching rate follows the order:R (310) ~ R (210)> R (100) ~ R (110)> R (111) . Besides the relative etching rates of the main crystallographic planes, other anisotropic features, like facets, were observed, indicating that the structures are very sensitive to changes in the anisotropic properties of the etchant.
In addition to their capacity for the revelation of the (an)isotropy of etchants, these wagon-wheel structures also demonstrate their benefit for the assessment of the selectivity of etchants. For this purpose, the system PAA/Si/Si75 Ge25 was assessed in terms of Si75 Ge25 etching, selective toward Si. Selectivity values were obtained by two methods:the first by measurement of the sidewall loss of the spokes; the second, indirect method, through measurement of the spoke retraction lengths. It was shown that the latter method could only be used after a certain critical etching time, after which the spoke tips have evolved toward a seemingly sharp tip.
In conclusion, scaled-down wagon-wheels can be used as lab-scale vehicles for the swift evaluation of anisotropy and selectivity of material/etchant pairs. The structures also have the potential to be used as high-throughput short loop test structures for the screening of etchants on 300 mm wafer wet processing tools. In addition, due to their small size, these wagon-wheels could be used for future in-situ etching studies, using liquid cell environmental electron transmission microscopy ETEM.
Verfügbarkeit von Daten und Materialien
All data are fully available without restriction.
Abkürzungen
- AA:
-
acetic acid
- BHF:
-
buffered hydrofluoric acid
- CD:
-
critical Dimension
- CMOS:
-
complementary metal oxide semiconductor
- c-Si:
-
single-crystalline silicon
- c-SiGe:
-
single-crystalline silicon-germanium
- ETEM:
-
environmental electron transmission microscopy
- FinFET:
-
fin field effect transistor
- FoV:
-
field of view
- GAA:
-
gate all around
- HF:
-
hydrofluoric acid
- MEMS:
-
microelectromechanical systems
- PAA:
-
peracetic acid
- R (xyz) :
-
etch rate of a (xyz) plane
- RDS:
-
rate determining step
- SEM:
-
scanning electron microscopy
- TMAH:
-
tetramethyl ammonium hydroxide
- VLSI:
-
very large-scale integration
Nanomaterialien
- Beteiligen Sie sich an einem Treffen der Köpfe und Maschinen
- Industrie 4.0 und das IoT:Markttrends für die nächsten Jahre
- Digitale Transformation in der Fertigung – Beschleuniger und Roadmap für Hersteller
- Hygienisches Design für die Lebensmittel- und Verarbeitungsindustrie
- Internet der Dinge und die Rolle von 5G in vernetzten Fahrzeugen
- Die fünf wichtigsten Probleme und Herausforderungen für 5G
- Industrielles IoT und die Bausteine für Industrie 4.0
- Die Vorteile und Herausforderungen der Hybridfertigung verstehen
- Funktionen der effektivsten APIs für die 3D-Visualisierung in der Fertigung
- Stempel- und Matrizenwartung:Die Formel für Erfolg und Produktivität



