Optimierung ohmscher Kontakte zu p-GaAs-Nanodrähten
Zusammenfassung
Die Leistungsfähigkeit ohmscher Kontakte, die auf Halbleiter-Nanodrähte (NWs) aufgebracht werden, ist ein wichtiger Aspekt, um ihre Verwendung in elektronischen oder optoelektronischen Geräten zu ermöglichen. Aufgrund der geringen Abmessungen und der spezifischen Oberflächenorientierung von NWs kann die für planare Heterostrukturen weit entwickelte Standardprozessierungstechnologie nicht direkt angewendet werden. Hier berichten wir über die Herstellung und Optimierung von ohmschen Pt/Ti/Pt/Au-Kontakten für p-Typ-GaAs-Nanodrähte, die durch Molekularstrahlepitaxie gezüchtet wurden. Die Geräte wurden durch Strom-Spannungs-(IV)-Messungen charakterisiert. Die Linearität der IV-Kennlinien einzelner Nanodrähte wurde durch Anpassung des Layouts der Kontaktmetallschichten, der Oberflächenbehandlung vor der Metallverdampfung und der thermischen Nachbehandlung optimiert. Unsere Ergebnisse zeigen, dass der Kontaktwiderstand merklich verringert wird, wenn eine Pt-Schicht auf dem GaAs-Nanodraht abgeschieden wird, bevor das herkömmliche Ti/Pt/Au-Mehrschicht-Layout für planares p-GaAs verwendet wird. Diese Ergebnisse werden durch eine verbesserte Qualität der Metall-GaAs-Grenzfläche erklärt, die durch Röntgenbeugungsmessungen mit streifendem Einfall in ähnlichen metallischen Dünnschichten nachgewiesen wurde, die auf GaAs (110)-Substraten abgeschieden wurden. Insbesondere zeigen wir, dass Ti einen geringen Kristallinitätsgrad aufweist, wenn es auf einer GaAs (110)-Oberfläche abgeschieden wird, was sich direkt auf den Kontaktwiderstand der NW-Bauelemente auswirkt. Die Abscheidung einer dünnen Pt-Schicht auf den NWs vor Ti/Pt/Au führt zu einer Verringerung des elektrischen Gesamtwiderstands von Be-dotierten GaAs-NWs um 95 %, was mit dem höheren Kristallinitätsgrad von Pt als Ti bei direkter Abscheidung zusammenhängt auf GaAs (110).
Einführung
Ein wichtiger Schritt bei der Herstellung elektronischer und optoelektronischer Halbleiterbauelemente besteht darin, hochwertige und zuverlässige Ohmsche Kontakte an der Metall-Halbleiter-Grenzfläche zu erhalten. Zu diesem Zweck ist GaAs ein wichtiges und weit verbreitetes Material in technologischen Anwendungen wie Lasergeräten, Solarzellen und Fotodetektoren. Daher war die Herstellung ohmscher Kontakte zu p- und n-dotierten GaAs-Schichten das Ziel zahlreicher Untersuchungen [1]. Im Allgemeinen umfasst die Herstellung ohmscher Kontakte zu Halbleitermaterialien vier Schritte:(1) Entfernung des oberflächeneigenen Oxids, (2) Passivierung der Oberflächenzustände an der Halbleiter-Metall-Grenzfläche, (3) Abscheidung metallischer Schichten, die als elektrische Kontakte und (4) thermisches Glühen [2, 3]. Ausgehend von der Auswahl von Metallen, die einen niedrigen Kontaktwiderstand und eine ausgezeichnete thermische Stabilität bieten, wurden Legierungen auf Au-Basis in großem Umfang genutzt, insbesondere für p-Typ-GaAs in Form von Au/Zn/Au [1, 3, 4] und Ti/ Pt/Au [1, 5]-Schichten. Andererseits haben sich Halbleiter-III-V-Nanodrähte (NWs) als neuere Klasse vielversprechender nanoskaliger Materialien für die Anwendung als LEDs [6, 7], Solarzellen [8, 9] und Photodetektoren [10] herausgestellt, und diese haben ausgelöst spezifische Entwicklungen in der Geräteverarbeitung.
Der Großteil der in der Literatur beschriebenen Technologie zur Herstellung ohmscher Kontakte wurde für GaAs-(100)-Dünnfilme und Volumenstrukturen entwickelt, während das selbstkatalysierte Wachstum von GaAs-NWs (110)-Oberflächenorientierung an den Seitenwänden ergibt [11,12,13, 14,15]. Unterschiedliche Oberflächenorientierungen weisen unterschiedliche elektronische Zustände auf [16], die die Grenzflächeneigenschaften und Schottky-Barrierehöhen beeinflussen [17,18,19]. Außerdem kann die Oberflächenorientierung die Kristallisationsdynamik der abgeschiedenen Metallfilme beeinflussen. Gute ohmsche Kontakte zu p-GaAs-NWs wurden zuvor beschrieben [20,21,22,23,24,25,26,27,28] durch eine Variation chemischer Behandlungen zur Entfernung des nativen Oxids, Oberflächenpassivierung und verschiedene metallische Multischichten auf den NWs hinterlegt. Dann wurde berichtet, dass die Verwendung von elektrischen Pt/Ti/Pt/Au-Kontakten für p-Typ-GaAs-Dünnschichten aufgrund der niedrigen Schottky-Barrierehöhe von Pt/GaAs einen niedrigen ohmschen Kontaktwiderstand selbst bei moderaten Dotierstoffkonzentrationen ergibt [29]. Darüber hinaus erwies sich Pt als thermisch stabil mit geringen Reaktionsgeschwindigkeiten zu GaAs für Wärmebehandlungen mit Temperaturen im Bereich von 300 bis 500°C [29,30,31]. Pt/Ti/Pt/Au-Metall-Mehrfachschichten sind der am häufigsten beschriebene [20, 23, 25, 26, 28] Ohmsche Kontakt zu p-GaAs-NWs. Ein umfassenderes Verständnis der Metalleigenschaften bei der ohmschen Kontaktbildung ist jedoch der Schlüssel zur weiteren Verbesserung der elektrischen Kontaktqualität auf nanoskaligen Geräten. Aufgrund des breiten Spektrums an NW-Wachstumstechniken und Dotierstoffkonzentrationen in p-GaAs-NWs, über die kürzlich berichtet wurde, wäre ein Vergleich der Kontaktwiderstände, wenn sie verfügbar sind, nicht praktikabel. Stattdessen wäre eine umfassende Untersuchung verschiedener Kontaktherstellungsrouten an demselben Satz von NW-Proben besser geeignet, um den Einfluss der NW-Eigenschaften auszuschließen.
Hier befassen wir uns mit den Auswirkungen verschiedener elektrischer Kontakte auf Pt- und Ti-Basis und Oberflächenbehandlungen vor der Metallverdampfung auf die Gesamtstrom-Spannungs-(IV)-Eigenschaften von selbstkatalysierten Be-dotierten GaAs-NWs, die auf Si-Substraten aufgewachsen sind [11, 32 ]. Wir analysieren die Änderungen des Gesamtwiderstands der NW-Kanäle basierend auf Strukturuntersuchungen durch Röntgenbeugung von Ti-, Pt- und Pt/Ti-Dünnfilmen, die auf GaAs (110)-Substraten abgeschieden wurden. Wir zeigen, dass ein hoher Kontaktwiderstand mit einem geringen Kristallinitätsgrad von Ti verbunden ist, wenn es direkt auf GaAs (110) abgeschieden wird, während elektrische Pt/Ti/Pt/Au-Kontakte zu einer bemerkenswerten Abnahme des Kontaktwiderstands führen, die auf zurückgeführt wird die Verbesserung der Metallschichtqualität, die in den ersten Pt/Ti-Schichten beobachtet wurde, die auf der GaAs-(110)-Oberfläche abgeschieden wurden.
Materialien und Methoden
Nanodrahtwachstum
Die selbstkatalysierten Be-dotierten GaAs-NWs wurden durch Molekularstrahlepitaxie (MBE) auf lithographiefreien Oxidmustern auf p-Si (111)-Substraten durch Tröpfchenepitaxie und spontane Oxidation aufgewachsen [32]. Die NW-Wachstumstemperatur betrug 640 °C, wie durch Pyrometer bestimmt, und es wurde ein Ga-Fluss verwendet, der einer planaren Wachstumsrate von 0,3 µm/h auf GaAs (100) entsprach. Eine Benetzung mit 60 s Ga ging dem NW-Wachstum voraus, das durch die Bereitstellung von As2 . eingeleitet wurde mit einem V/III-Strahläquivalentdruckverhältnis von 9 und einem Be-Fluss entsprechend 2,0 × 10 19 cm −3 p-Dotierungskonzentration; dies wurde aus dem Wachstum von planaren Be-dotierten GaAs (100)-Kalibrierproben durch Hall-Messungen bei Raumtemperatur bestimmt. Die Wachstumsdauer betrug 60 min. Weitere Einzelheiten zur Wachstumsmethodik und den strukturellen Eigenschaften der undotierten und Be-dotierten NWs finden sich in Lit. [11, 32, 33]. Kurz gesagt bestehen die NWs aus reinem Zinkblende-GaAs mit der Bildung einiger Zwillingsebenen [33]. Die NWs haben eine hexagonale Form mit Seitenwänden, die ausschließlich aus (110)-orientierten Facetten bestehen, wie es zuvor durch die Strukturanalyse der Be-dotierten NWs bestimmt wurde [33] und weiter bestätigt in undotierten GaAs-NWs, die unter ähnlichen Bedingungen gewachsen sind [12].
Kontaktherstellung und -charakterisierung
Die NWs wurden mechanisch auf ein p-GaAs (100)-Substrat übertragen, das mit einem 200 nm dicken SiO2 . bedeckt war Schicht, die durch Photolithographie und Elektronenstrahlverdampfung von Ti/Au-Pads zur Transportcharakterisierung vorstrukturiert wurde. Die Position der übertragenen Drähte auf dem Substrat wurde durch Rasterelektronenmikroskopie (REM) mit geringer Vergrößerung identifiziert. Positiv-Elektronenstrahlresist wurde auf das Substrat aufgeschleudert und mit Elektronenstrahlen auf den elektrischen Kontaktbereichen belichtet. Der Resist wurde in MIBK:IPA-Lösung nach der Elektronenstrahlbelichtung und möglicherweise gefolgt von einer Sauerstoffplasmabehandlung entwickelt, um den restlichen Resist der NW-Seitenwände zu entfernen, wie in Tabelle 1 beschrieben. Die Auswirkungen der Sauerstoffplasmabehandlung auf die Geräteleistung sind später im Text besprochen. Vor der Metallverdampfung der Kontaktschichten wurden die Proben chemisch behandelt, um das native Oxid zu entfernen und die freigelegten NW-Seitenwände zu passivieren, wie später im Text beschrieben. Das Abheben erfolgte durch Eintauchen der Probe in erhitztes Aceton, Spülen in IPA und Föhnen mit Stickstoff.
Wir haben fünf verschiedene Prozesse entwickelt, die verschiedene Oberflächenbehandlungen der freiliegenden NW-Seitenwände mit verschiedenen metallischen Multilayern kombinieren, die als elektrische Kontakte verwendet werden. Dies ermöglichte es uns, die individuellen Beiträge jedes Parameters zum resultierenden Kontaktwiderstand zu bestimmen, wenn er auf die p-Typ-GaAs-NWs angewendet wird. Für die Entfernung des nativen Oberflächenoxids haben wir entweder ein 2,8%iges NH4 . verwendet OH oder 3,7 % HCl verdünnt in H2 O gefolgt von H2 O spülen. Für die Oberflächenpassivierung verwendeten wir eine 15%ige Lösung von (NH4 )2 Sx verdünnt in H2 O (auf 45°C erhitzt) gefolgt von H2 O spülen. Die metallischen Mehrfachschichten wurden mittels Elektronenstrahlverdampfung abgeschieden und waren entweder Ti/Pt/Au (20/20/200 nm) oder Pt/Ti/Pt/Au (5/10/10/200 nm). Für die Pt/Ti/Pt/Au-Mehrfachschicht wurde ein schnelles thermisches Glühen (RTA) von 400 °C für 30 Sekunden verwendet. Die für jede Probe verwendeten Prozesse sind in Tabelle 1 angegeben. Für jede Probe wurden 4 gleichmäßig beabstandete elektrische Kontakte entlang der NW-Achse hergestellt. In dieser Arbeit beschränken wir die IV-Analyse auf die Kontaktpaare, die sich im mittleren Bereich des NW befinden. Die IV-Daten wurden bei Raumtemperatur mit einer Keysight-Sondenstation erhalten.
Strukturuntersuchung durch streifende Inzidenz-Röntgenbeugung
Um die strukturellen Eigenschaften der elektrischen Kontakte auf den NWs zu untersuchen, wurden Röntgenbeugungsmuster unter streifendem Einfall (GIXRD) von Referenz-Ti-, Pt- und Pt/Ti-Dünnfilmen gemessen, die auf undotierten GaAs (110)-Substraten aufgedampft wurden. Wir haben die in Tabelle 2 beschriebenen Dünnschichtproben mit nativer Oxidentfernung durch HCl hergestellt:H2 O und Oberflächenpassivierung durch (NH4 )2 Sx wie bei den NW-Geräten. Der kleine Einfallswinkel der in GIXRD verwendeten Röntgenstrahlen ermöglicht es uns aufgrund der geringen Eindringtiefe, metallische Filme mit der gleichen Dicke wie bei den NW-Kontakten zu analysieren. Die GIXRD-Muster wurden mit Cu Kα-Strahlung mit einer Wellenlänge von 1,54 Å und einem Einfallswinkel von ω . gemessen = 0,75° bezogen auf die Probenoberfläche. Die Positionen der Beugungspeaks sind gemäß den ICDD-Dateien #00-044-1294 und #00-004-0802 für hexagonal-closedpacked (HCP) Ti bzw die Wirkung der Brechung der Röntgenstrahlen in GIXRD-Experimenten, wie in Lit. beschrieben. [34].
Ergebnisse und Diskussion
Abbildung 1a zeigt die IV-Eigenschaften für die Proben P1 bis P5 und Fig. 1b ein SEM-Bild eines Be-dotierten GaAs-NW mit elektrischen Kontakten zur Transportcharakterisierung. Die fast symmetrische, nichtlineare Form der IVs für P1 bis P4 in Abb. 1a weist darauf hin, dass die Kontakte vom Schottky-Typ mit ähnlichen Barrierenhöhen für jeden Kontakt sind [35]. Die Nichtlinearität der IV für Probe P1 zeigt offensichtlich, dass der Standard-p-GaAs-Prozess wie in P1 keine ohmschen Kontakte liefert, wie dies bei planaren GaAs-Dünnschichten der Fall ist. Normalerweise wird in dotierten GaAs-NWs die Entfernung von HCl-Oxid verwendet, möglicherweise gefolgt von (NH4 )2 Sx Oberflächenpassivierung vor der Metallverdampfung zur ohmschen Kontaktbildung [20, 21, 36, 37] anstelle von NH4 OH. Darüber hinaus wurde zuvor eine Sauerstoffplasmabehandlung der exponierten NW-Oberfläche verwendet, um den restlichen Resist von den NW-Seitenwänden zu entfernen [36, 38]. Als Nebeneffekt kann dieser Prozess jedoch Oberflächendefekte in GaAs wie As-Leerstellen induzieren, was zu Donator-ähnlichen Fallen führt, die für die Ladungsträgerkompensation verantwortlich sind und daher die Verarmungsschichtbreite erhöhen [5].
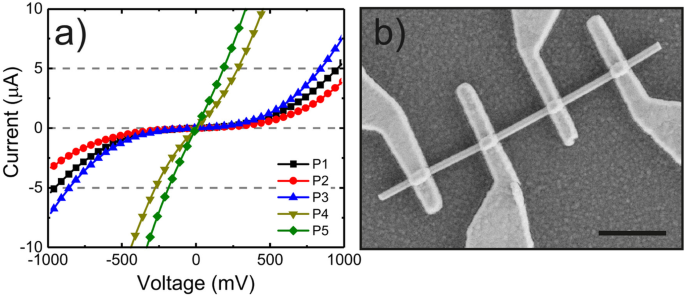
a IV aus Be-dotierten GaAs-NWs mit elektrischen Kontakten, die mit den Verfahren P1–P5 wie in Tabelle 1 beschrieben hergestellt wurden. b REM-Aufnahme eines repräsentativen Be-dotierten GaAs NW mit vier gleichmäßig beabstandeten elektrischen Kontakten. Der Maßstabsbalken beträgt 1 μm
Um die Wirkung der Sauerstoffplasmabehandlung auf den Kontaktwiderstand von p-GaAs-NWs zu bewerten, vergleichen wir die IV einer Probe mit (P2) und ohne (P3) Sauerstoffplasmareinigung vor der Oberflächenbehandlung mit HCl und (NH4 )2 Sx in Abb. 1a. P2 liefert die schlechteste IV-Leistung (definiert als der elektrische Stromwert für dieselbe angelegte Spannung) in allen Proben, aber die Probe P3 zeigt ihrerseits eine bessere IV-Leistung als der Standard-p-GaAs-Prozess P1 und das mit Sauerstoffplasma gereinigte P2. Dies impliziert zwei signifikante Ergebnisse:(i) die Wirkung der Sauerstoffplasmabehandlung ist nachteilig auf den Kontaktwiderstand und (ii) die P3 mit HCl-Oxidentfernung kombiniert mit (NH4 )2 Sx Oberflächenpassivierung führt zu einer geringeren Schottky-Barrierehöhe der Metall-Halbleiter-Grenzfläche im Vergleich zu P1.
Die IV-Leistung und der Ohmsche Charakter (qualitativ durch die IV-Linearität bewertet) wurden in P4 im Vergleich zu P3 durch Hinzufügen einer 5-nm-Pt-Schicht unter der Ti/Pt/Au-Mehrfachschicht stark verbessert, wie aus Abb. 1a ersichtlich. Der Kontaktwiderstand wird in P5 nach RTA 30 s bei 400°C weiter verringert, wodurch ein lineares IV-Verhalten und eine verbesserte IV-Leistung im Vergleich zu P4 erreicht werden.
Um den Einfluss der Verarbeitungsparameter auf den Kontaktwiderstand der Proben P1–P5 (chemische Behandlungen, metallische Multilayer) zu quantifizieren, zeigen wir in Abb. 2a die IVs von P1–P5 mit einem kleineren Bias-Bereich; in diesem Fall zeigen die IVs ein lineares Verhalten und werden hauptsächlich durch den Kontaktwiderstand bestimmt [35]. Der Gesamtwiderstand des Kanals (Kontakte + NW) im 100 mV-Bereich aus Abb. 2a wurde aus einer linearen Anpassung der IV-Kennlinie berechnet und die Ergebnisse sind in Abb. 2b dargestellt. Da die Durchmesser aller untersuchten NWs ähnlich sind und die Dotierstoffkonzentration von Draht zu Draht nur geringfügig variiert, wie bereits berichtet [33], wurden Änderungen des Gesamtwiderstands auf den Kontaktwiderstand zurückgeführt. Der höhere Widerstand in P2 im Vergleich zu P1 und P3 bestätigt die schädliche Wirkung der Sauerstoffplasmabehandlung aus der qualitativen Analyse der IVs in Abb. 1a. Ein bemerkenswertes Ergebnis ist die Abnahme des Gesamtwiderstands von 1400 kΩ in P3 auf 72 kΩ in P4 und eine weitere Abnahme auf 40 kΩ nach RTA in P5, erreicht durch Abscheidung einer zusätzlichen Pt-Schicht vor der in . verwendeten Ti/Pt/Au-Mehrfachschicht Samples P1–P3.
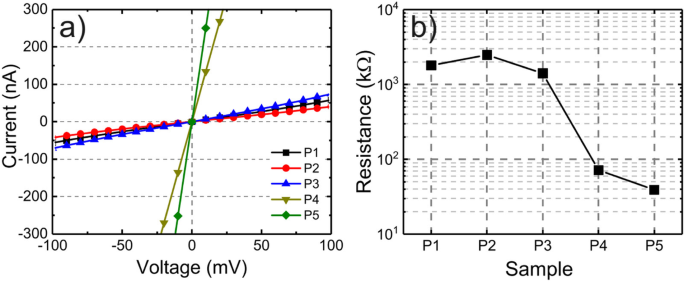
a IV von P1 bis P5 im angelegten Spannungsbereich von 100 mV. b Gesamtkanalwiderstand von P1–P5, erhalten aus linearer Anpassung der IVs in a
Ein umfassenderes Verständnis der Mikrostruktur der Metall-Halbleiter-Grenzfläche nach der Kontaktherstellung ist erforderlich, um eine Korrelation der Änderungen des Kontaktwiderstands herzustellen, die in den Proben P1–P5 beobachtet wurden. Die Verwendung von Ti und Pt bei der Herstellung von ohmschen Kontakten zu GaAs wurde bereits beschrieben [39, 40] und die strukturellen Eigenschaften von dünnen Ti- und Pt-Filmen, die auf die Oberfläche von GaAs (100) aufgedampft wurden [41] und amorphe Glassubstrate [42, 43 ] wurden ebenfalls analysiert. Für die Oberfläche von GaAs (110) wurden jedoch keine derart detaillierten Untersuchungen gefunden. Es wird erwartet, dass die unterschiedliche Oberflächenorientierung die Kristallisationsdynamik der Ti- und Pt-Dünnfilme beeinflusst. Darüber hinaus wird die chemische Oberflächenpassivierung durch (NH4 )2 Sx die resultierenden dünnen Filme weiter beeinflussen könnten. Der Kristallisationsgrad von Pt (5 nm), Ti (20 nm) und Pt/Ti (5/20 nm) dünnen Filmen, die auf undotiertem GaAs (110) Substrat abgeschieden wurden, wurde von GIXRD untersucht, um Informationen über die strukturellen Eigenschaften zu erhalten der ersten metallischen Schichten in Kontakt mit den NWs in P1–P5. Vor der Metallverdampfung durchliefen die GaAs (110)-Substrate die native Oxidentfernung durch HCl:H2 O und das (NH4) )2 Sx Oberflächenpassivierungsschritte als die NW-Proben P3–P5. Die Details der Oberflächenbehandlungen und metallischen Dünnschichten, die auf das GaAs (110)-Substrat aufgedampft wurden, sind in Tabelle 2 zusammengefasst.
Die GIXRD-Muster der Proben S1–S4 sind in Fig. 3a im Beugungswinkelbereich von 30 bis 60° und in Fig. 3b im Bereich von 60 bis 90° gezeigt. Die Beugungsmuster in Abb. 3 sind vertikal verschoben und in zwei Beugungswinkelbereiche getrennt, um eine bessere Skalierung für die Visualisierung zu ermöglichen. Zuerst konzentrieren wir uns auf die Wirkung von (NH4 )2 Sx Oberflächenpassivierung auf den Kristallinitätsgrad von Ti-Filmen, die auf GaAs (110)-Substrat aufgedampft sind, durch Vergleich der Proben S1 und S2. In Abb. 3a beobachten wir überlappende Ti-(002)- und Ti-(101)-Peaks niedriger Intensität, die bei 38,4 bzw. 40,2° zentriert sind, sowohl für S1 als auch für S2. Darüber hinaus wird für beide Proben auch ein deutlich breiterer Ti (102)-Peak bei 53,0 ° beobachtet, was auf einen amorphen Charakter hindeutet. Der bei 70,6° zentrierte Ti (103)-Peak in Abb. 3b wird nur für S1 beobachtet, was die einzige signifikante Abweichung zwischen den Proben ist. Im Allgemeinen weisen die niedrigen Intensitäten und breiten Peaks von S1 und S2 auf eine schlechte Kristallinität der Ti-Filme hin, wenn sie nach der Entfernung von HCl-Oxid auf der GaAs (110)-Oberfläche abgeschieden werden und unabhängig von der Verwendung von (NH4 )2 Sx Passivierung. Im Fall von S3, für das Pt auf GaAs (110)-Substrat mit der gleichen Oberflächenbehandlung wie in S2 abgeschieden wurde, beobachten wir viel stärker Pt (111), Pt (200), Pt (220), Pt (311), und Pt(222)-Beugungspeaks, zentriert bei 39,8°, 46,3°, 67,5°, 81,3° bzw. 85,7°. Dies weist darauf hin, dass der Pt-Film in S3 im Vergleich zu den Ti-Proben einen höheren Kristallinitätsgrad aufweist. Das gleiche gilt für S4, das ähnliche Pt-Beugungssignaturen wie S3 in Fig. 3a, b zeigt. Die breiten und asymmetrischen Peaks zwischen 35°–45°, 65°–75° und 75°–90° für S4 werden aufgrund der Überlappung von Ti (002)-Ti (101)-Pt (111), Ti ( 103)-Pt (220) bzw. Ti (004)-Pt (311)-Pt (222) Beugungspeaks. Ein qualitativer Vergleich der GIXRD-Muster von S2, S3 und S4 impliziert, dass der Kristallinitätsgrad von Ti in S4 mindestens auf dem gleichen Niveau wie in S1 liegt. Der Ti (103)-Peak bei 70,6° wird als klare Schulter auf dem Pt (220)-Peak in Abb. 3b beobachtet und der Ti (102)-Peak bei 53,0° in Abb. 3a ist mit geringer Intensität, aber schmaler Linienbreite in S4 . vorhanden während es in S1 und S2 einen sehr breiten, amorphen Peak zeigt. Dieses Ergebnis legt einen verbesserten Kristallinitätsgrad von Ti nahe, wenn es auf Pt statt auf der GaAs-(110)-Oberfläche abgeschieden wird, was im Folgenden direkt mit den in den Fig. 1 und 2 beschriebenen elektrischen Kontakteigenschaften korreliert wird. 1 und 2.
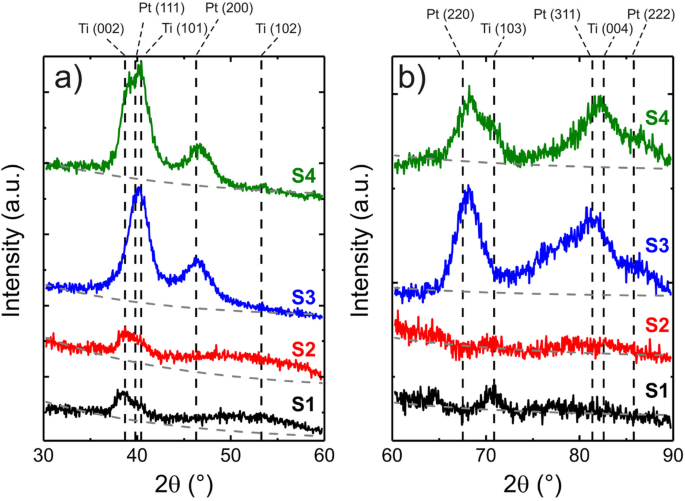
GIXRD-Muster aus den Samples S1–S4 der a 30 bis 60° Beugungswinkelbereich und (b ) 60 bis 90° Bereich. Die gestrichelten grauen Linien stellen exponentielle Zerfallsbasislinien dar, die von diffuser Röntgenstreuung herrühren. Die vertikalen gestrichelten schwarzen Linien entsprechen den verschiedenen Beugungsebenen von Ti und Pt, die oben in a . markiert sind und b
Die GIXRD-Analyse der metallischen Schichten in S1–S4 ermöglicht es uns, den Kristallinitätsgrad von Ti und Pt, abgeschieden auf GaAs (110)-Substrat, und den Gesamtwiderstandsergebnissen von P1–P5 in Abb. 2b zu korrelieren. Es ist wichtig zu betonen, dass wir in dieser Arbeit unsere Korrelationen der Änderungen des Gesamtwiderstands von P1–P5 hauptsächlich auf den GIXRD-Daten basieren, die von S1–S4 erhalten wurden. Wir gehen davon aus, dass andere Faktoren, wie die Qualität der Metall-NW-Grenzfläche aufgrund der hexagonalen Geometrie der NWs-Seitenwände, einen vernachlässigbaren Beitrag zu den in P1–P5 beobachteten Gesamtwiderstandsänderungen haben. Die (NH4 )2 Sx Oberflächenpassivierung hat einen positiven Einfluss auf die Eigenschaften der GaAs-Metall-Grenzfläche, wie ein Vergleich der IV und des Gesamtwiderstands der Proben P1 und P3 zeigt, jedoch mit einem geringen Kristallinitätsgrad des Ti-Films, wenn er direkt auf der GaAs (110)-Oberfläche abgeschieden wird , wie in S1 und S2 beobachtet. Dies könnte das Ergebnis einer Reaktion von Schwefel mit dem überwachsenen Ti sein. Darüber hinaus wurde berichtet, dass Ti während der Metallabscheidung mit den verbleibenden Verunreinigungen in der Verdampfungskammer hochreaktiv ist [41], zusätzliche Schichten zwischen dem Metall/GaAs bildet und somit den Kontaktwiderstand erhöht [5]. Wie bereits erwähnt, wurde die Erhöhung des Kontaktwiderstands in P2 auf mögliche Oberflächenschäden durch die Sauerstoffplasmareinigung zurückgeführt. Das Hinzufügen einer dünnen Pt-Schicht zwischen der Ti- und der GaAs-(110)-Oberfläche wie in S4 führt zu einem höheren Kristallinitätsgrad des Ti-Films im Vergleich zu S1 und S2. Dieses Ergebnis kann mit der Abnahme des Gesamtkanalwiderstands von 1400 kΩ in P3 auf 72 kΩ in P4 korreliert werden, was mit einer Abnahme des Kontaktwiderstands einhergeht. Der RTA verringert den Gesamtkanalwiderstand weiter auf 40 kΩ in P5 zusätzlich zur Erhöhung des Ohmschen Charakters der IV, die in Fig. 2a gezeigt ist. Dieses Ergebnis zeigt, dass bei der verwendeten Glühtemperatur und -zeit keine schädlichen Reaktionen zwischen der Pt- und der GaAs-Oberfläche auftreten [29,30,31].
Schlussfolgerungen
Der Einfluss der chemischen Oberflächenbehandlung vor der Metallverdampfung und der Bildung von Ohmschen Kontakten zu Be-dotierten selbstkatalysierten GaAs-NWs wurde durch korrelierende Transportcharakterisierung einzelner NWs und Strukturanalyse von Ti-, Pt- und Pt/Ti-Dünnfilmen, die auf abgeschieden wurden, untersucht GaAs-Substrate. Wir zeigen, dass Ti einen geringen Kristallinitätsgrad aufweist, wenn es auf einer GaAs (110)-Oberfläche abgeschieden wird, was sich direkt auf den Kontaktwiderstand der NW-Bauelemente auswirkt. Die Abscheidung einer dünnen Pt-Schicht auf den NWs vor Ti/Pt/Au führt zu einer Verringerung des elektrischen Gesamtwiderstands von Be-dotierten GaAs-NWs um 95 %, was mit dem höheren Kristallinitätsgrad von Pt als Ti bei direkter Abscheidung zusammenhängt auf GaAs (110). Darüber hinaus zeigen wir, dass das thermische Tempern der metallischen Schichten den Kontaktwiderstand weiter senkt. Diese Ergebnisse sind von technologischer Bedeutung beim Design ohmscher Kontakte für GaAs-NWs-basierte Geräte und zeigen die einzelnen Beiträge jedes Verarbeitungsschritts, beschrieben in Tabelle 1, zum Gesamtwiderstand und ohmschen Charakter der NW-Bauelemente. Um die Geräteleistung weiter zu verbessern, wäre eine systematische Optimierung der Parameter jedes einzelnen Schrittes erforderlich. Insbesondere zeigen wir, dass die Metall-Halbleiter-Grenzfläche an den NW-Seitenwänden eine wichtige Rolle für die Leistungsfähigkeit der Bauelemente spielt und den Weg für weitere Untersuchungen des Kristallisationsprozesses von metallischen Dünnfilmen ebnet, die auf verschiedenen Oberflächenorientierungen von III–V-Halbleitermaterialien abgeschieden werden.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieser Studie unterstützen, sind im Artikel enthalten.
Abkürzungen
- FCC:
-
Kubisch flächenzentriert
- GIXRD:
-
Röntgenbeugung bei streifendem Einfall
- HCP:
-
Sechskant-geschlossen verpackt
- IV:
-
Strom–Spannung
- NW:
-
Nanodraht
- RTA:
-
Schnelles thermisches Glühen
- SEM:
-
Rasterelektronenmikroskopie
Nanomaterialien
- Wolframkontakte für Elektrogeräte
- Kontaktdesign wechseln
- Kontaktieren Sie "Bounce"
- Zeitverzögerungsrelais
- Digitale Logikfunktionen
- Kontaktlinse
- Materialwissenschaftler bringen Nanodrähten das Tanzen bei
- Hochreflektierende Dünnschicht-Optimierung für Vollwinkel-Mikro-LEDs
- Mehrschichtige SnSe-Nanoflake-Feldeffekttransistoren mit niederohmigen Au-Ohm-Kontakten
- Au-beschichtete GaAs-Nanopillar-Arrays, hergestellt durch metallunterstütztes chemisches Ätzen



