Optimierungsstrategie der durch 4H-SiC getrennten Absorptionsladungs- und Multiplikations-Lawinen-Photodiodenstruktur für eine hohe UV-Detektionseffizienz
Zusammenfassung
In dieser Arbeit werden systematisch parametrische Untersuchungen zur Strukturoptimierung für 4H-SiC-basierte, separierte Absorptionsladungs- und Multiplikations-(SACM)-Lawinen-Ultraviolett-Photodioden (UV-APD) durchgeführt. Nach unseren Ergebnissen kann die Durchbruchspannung stark von der Dicke der Vervielfachungsschicht und der Dotierungskonzentration der Ladungssteuerschicht beeinflusst werden. Die Dicke der ohmschen Kontaktschicht vom n-Typ, der Absorptionsschicht und der Ladungssteuerschicht kann die Lichteindringtiefe merklich beeinflussen, was entsprechend die Anzahl der durch Licht erzeugten Elektron-Loch-Paare beeinflusst, und daher hat die oben erwähnte Schichtdicke a starken Einfluss auf die Ansprechempfindlichkeit für SACM APD. Um die Ansprechempfindlichkeit der APD zu verbessern, benötigen wir eine reduzierte Höhe der Energiebandbarriere an der Grenzfläche der optischen Absorptionsschicht und der Ladungskontrollschicht, so dass der geförderte Ladungsträgertransport in die Vervielfachungsschicht begünstigt werden kann. Darüber hinaus untersuchen wir positiv abgeschrägte Mesas mit kleineren Winkeln, um das elektrische Feld an der Mesakante zu reduzieren. Somit wird der Dunkelstrom entsprechend unterdrückt.
Einführung
Als Halbleitermaterial mit großer Bandlücke weisen Siliziumkarbid (SiC) und Aluminium-Gallium-Nitrid (AlGaN) hervorragende Materialeigenschaften wie ein hohes kritisches elektrisches Feld, einen besseren Anti-Strahlungseffekt und eine gute Wärmeleitfähigkeit auf, wodurch es für Ultraviolett (UV) geeignet ist. Erkennung [1,2,3]. Die einstellbare Bandlücke zwischen 3,4 und 6,2 eV für die AlGaN-basierten Photodetektoren ermöglicht die steuerbare Cutoff-Reaktionswellenlänge im Bereich von 365 bis 200 nm. Aufgrund der Schwierigkeit, hochwertige Al-reiche AlGaN-Verbindungen zu züchten, ist der Dunkelstrom bei den AlGaN-basierten Photodetektoren jedoch höher als bei den SiC-basierten Gegenstücken [4]. Daher haben SiC-basierte Photodetektoren ein umfangreiches Forschungsinteresse gefunden. Bisher umfassen Festkörper-UV-Detektoren auf 4H-SiC-Basis eine Schottky-Diode, eine Metall-Halbleiter-Metall-(MSM)-Photodiode, eine p-i-n-Photodiode und eine Avalanche-Photodiode (APD) [5,6,7,8,9]. Aufgrund der hohen Lawinenverstärkung, des kleinen Dunkelstroms und des geringen Rauschens haben 4H-SiC-Ultraviolett-APDs große Anwendungsaussichten in vielen hochmodernen Bereichen, die eine Erkennung schwacher ultravioletter Signale erfordern, wie z. B. Feuerwarnung, Quantenkommunikation und Raketenerkennung [ 10,11,12]. Jedoch weist SiC-Material einen niedrigen Lichtabsorptionskoeffizienten auf, daher ist es schwierig, mit einer üblichen Photodiodenstruktur mit einer dünnen Multiplikationsschicht eine hohe Quanteneffizienz zu erreichen. Das Problem wird nicht gelöst, bis die APD mit getrennter Absorptionsladung und Multiplikation (SACM) vorgeschlagen wird. Einerseits kann das UV-Licht von der Absorptionsschicht effektiv absorbiert werden und andererseits kann durch das Stoßionisationsverfahren die hohe interne Verstärkung in der Hochfeld-Vervielfachungsschicht erzielt werden. Der Stoßionisationsprozess in der Multiplikationsschicht kann durch die Ladungskontrollschicht beendet werden [13, 14]. Der Vorteil der SACM-Struktur ergibt sich aus dem reduzierten Rauschen, da nur ein einziger Typ photogenerierter Ladungsträger mit größerer Ionisationsrate in die Vervielfachungsschicht injiziert werden kann [15, 16]. Um eine hohe Detektivität für schwache ultraviolette Signale zu erreichen, sollen SACM-APDs mit großer aktiver Detektionsfläche hergestellt werden [17]. Die erhöhte Gerätegröße wird jedoch von einem deutlich erhöhten Oberflächenleckstrom und Massenleckstrom begleitet. Somit stellt dies nicht nur eine strenge Anforderung an die Qualität eines SiC-Epitaxiewafers, sondern spiegelt auch eine große Herausforderung für den Vorrichtungsherstellungsprozess und das Vorrichtungsdesign wider. In den letzten Jahrzehnten hat Cree Company die epitaktische Wachstumstechnologie für SiC-Schichten stark vorangetrieben, was somit zu einer kontinuierlichen Verbesserung der kristallinen Qualität geführt hat. Zuletzt haben Zhou et al. haben eine Photoresist-Reflow-Technik mit variabler Temperatur vorgeschlagen, um sehr glatte Seitenwände für die abgeschrägte 4H-SiC-APD-Mesa zu erzeugen [18], die einen hohen Multiplikationsgewinn von über 10 6 . ermöglicht und ein niedriger Dunkelstrom von ~ 0,2 nA/cm 2 . Dennoch konzentrierte sich die bisherige Forschung mehr auf die Verbesserung der Materialqualität und die Optimierung der Herstellungstechnologie für SACM-APDs [19,20,21], während die Auswirkungen des strukturellen Designs auf den photogenerierten Ladungsträgertransport und die Photostromdetektivität bisher kaum diskutiert wurden . Daher untersuchen wir in diesem Brief systematisch die optoelektronische Leistung von großflächigen 4H-SiC-basierten SACM-UV-APDs mit unterschiedlichen strukturellen Designs. In der Zwischenzeit werden auch aufschlussreiche physische Bilder und Diskussionen bereitgestellt. Wir glauben, dass die Ergebnisse dieser Arbeit für Forscher nützlich sind, um 4H-SiC-APDs zu geringeren Kosten zu optimieren.
Die großflächige Ladungsträgervervielfachung wird bekanntlich bei der Stoßionisation erzeugt, die jedoch stark von der Dicke der Vervielfachungsschicht und der Dotierungskonzentration der Ladungssteuerschicht beeinflusst wird. In der Vervielfachungsschicht wird das sehr starke elektrische Feld erzeugt, um die Stoßionisation zu ermöglichen. Das elektrische Feld kann aufgrund der größeren Dotierungskonzentration darin durch die Ladungssteuerschicht beendet werden. Darüber hinaus stellen wir auch fest, dass wir durch Modulieren des Energiebandes zwischen der Absorptionsschicht und der Ladungskontrollschicht in der Lage sind, die spektrale Empfindlichkeit einzustellen. Eine vernünftige Verwendung einer positiv abgeschrägten Mesa kann eine signifikante Verringerung des elektrischen Feldes der Seitenwandoberfläche erreichen, was hilfreich ist, um den Dunkelstrom und den Kantendurchschlag zu unterdrücken. Detaillierte Analysen und Diskussionen werden anschließend durchgeführt.
Forschungsmethoden und Physikmodelle
Abbildung 1a zeigt die schematische Querschnittsansicht einer Standard-4H-SiC-SACM-APD, die in dieser Arbeit verwendet wird und n + . besitzt -Typ 4H-SiC-Schicht als Substrat. Dann besteht der Architekturstack aus einem 3 µm dicken p + -Typ-Ebene (N a = 1 × 10 19 cm −3 ), die als ohmsche Kontaktschicht vom p-Typ dient, ein 0,5 µm dickes n – -Typ Multiplikationsschicht (N d = 1 × 10 15 cm −3 ) zur Ladungsträgervervielfachung eine 0,2 µm dicke n-Typ-Ladungskontrollschicht (N d = 5 × 10 18 cm −3 ) zum Beenden des Stoßionisationsprozesses und ein 0,5 µm dickes n − -Typ Absorptionsschicht (N d = 1 × 10 15 cm −3 ) um die einfallenden Photonen zu absorbieren. Auf der Gerätestruktur befindet sich ein 0,3 µm dickes n + -Typ ohmsche Kontaktschicht (N d = 1 × 10 19 cm −3 ). Ein positiver Fasenwinkel (θ = 8°) wird für die Mesastruktur erzeugt, um den Kantendurchbruch zu unterdrücken [22, 23]. Der Durchmesser der 4H-SiC SACM APDs beträgt 800 µm. Sowohl die Kathoden- als auch die Anodenkontakte werden in unseren Berechnungen als ideale ohmsche Kontakte betrachtet. Gemäß Abb. 1c und d veranschaulichen unsere Ergebnisse, dass die berechneten Ergebnisse für die oben genannte Standard-4H-SiC-SACM-APD-Struktur einen Dunkelstrom von 2,5 nA/cm 2 . aufweisen , die Durchbruchspannung von 161,6 V und die Spitzenempfindlichkeit von 0,11 A/W bei der Wellenlänge von 280 nm. Die berechneten Strom-Spannungs-Kennlinien und das Ansprechverhalten für Standard-4H-SiC-SACM-APD stimmen mit den experimentellen Daten überein. Dies beweist vollständig, dass die in dieser Arbeit verwendete Stoßionisation, der 4H-SiC-Materialabsorptionskoeffizient, die Poisson-Gleichung, die Stromkontinuitätsgleichung und die Drift-Diffusions-Gleichungen vernünftig sind. Hier nehmen wir die Struktur in Abb. 1a als Forschungsmaßstab, während die untersuchten Variablen den abgeschrägten Mesawinkel, die Dicke und die Dotierungskonzentration für jede Schicht umfassen.
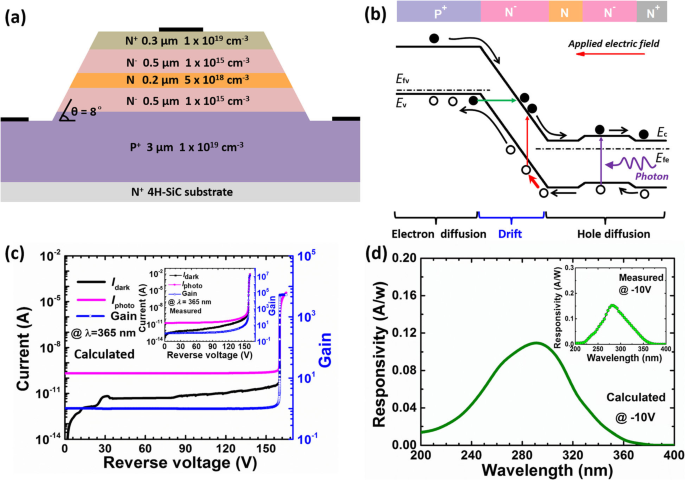
a Schematischer Querschnittsaufbau (nicht maßstabsgetreu), b schematisches Energiebanddiagramm unter Sperrspannung für Standard-4H-SiC-SACM-APD, c berechnete Strom-Spannungs-Kennlinien und die Multiplikationsverstärkung und d berechnete spektrale Ansprecheigenschaften bei einer Sperrspannung von 10 V für Standard-4H-SiC-SACM-APD. Eingesetzte Figur in c zeigt die gemessenen Strom-Spannungs-Kennlinien und die Multiplikationsverstärkung. Eingesetzte Figur in d zeigt gemessene spektrale Ansprecheigenschaften für Standard-4H-SiC-SACM-APD mit einer Vorspannung von – 10 V
Um den Einfluss verschiedener Strukturvariablen auf die photoelektrischen Eigenschaften von 4H-SiC-SACM-APDs besser zu verstehen, zeigt Abb. 1b das schematische Energiebanddiagramm unter Sperrspannung. Die durch Licht erzeugten Elektron-Loch-Paare in der Absorptionsschicht werden über die Ladungssteuerschicht in die Vervielfachungsschicht diffundieren. Nachdem die durch Licht erzeugten Elektron-Loch-Paare den Vervielfachungsbereich erreicht haben, werden sie durch das verarmte elektrische Feld getrennt. Löcher erfahren dann einen Multiplikationsprozess in der Multiplikationsschicht, was zu einer internen Stromverstärkung führt. Währenddessen kehren die durch Licht erzeugten Elektronen zur Kathode zurück und werden ohne Stoßionisation in Strom umgewandelt. Wichtige Faktoren, die den Photostrom beeinflussen, sind die elektrischen Feldprofile in der Multiplikationsschicht, die Ausrichtung der Energiebänder in der Ladungssteuerschicht, der Absorptionsschicht und der ohmschen Kontaktschicht vom n-Typ, in der jede Energiebarriere den Ladungsträgertransport behindern kann. Es ist auch erwähnenswert, dass die elektrischen Feldprofile in der Vervielfachungsschicht durch die Dotierungskonzentrationen sowohl für die Vervielfachungsschicht als auch für die Ladungssteuerschicht bestimmt werden können. Der abgeschrägte Mesa-Winkel steht im Wesentlichen auch im Zusammenhang mit der Verteilung des elektrischen Felds. Wir werden auch auf die Dicke jeder Schicht achten, um den hocheffizienten Trägerdiffusionsprozess zu gewährleisten. Daher ist es wichtig, diese strukturellen Schlüsselparameter zur Optimierung der Geräteleistung systematisch zu untersuchen.
Die numerischen Untersuchungen werden von APSYS durchgeführt, das aktuelle Kontinuitätsgleichungen, Poisson-Gleichungen und Drift-Diffusions-Gleichungen konsistent mit geeigneten Randbedingungen lösen kann. Sowohl Stoßionisations- als auch Zener-Tunnelprozesse wurden in Drift-Diffusions-Gleichungen eingeschlossen. Die Träger-Träger-Streuung für den Trägertransportprozess wurde auch in das Niedrigfeld-Mobilitätsmodell aufgenommen. Die Shockley-Read-Hall (SRH)-Rekombinationslebensdauer wird mit 1 μs angenommen [24]. Insbesondere das Feld (E ) Abhängigkeit der Stoßionisationskoeffizienten für Elektronen (α n ) und Löcher (β p ) für 4H-SiC-basierte Schichten kann durch die Chynoweth-Formeln (1) bzw. (2) wie folgt ausgedrückt werden [25]:
$$ {\alpha}_n=1,98\times {10}^6\exp \left[-{\left(\frac{9.46\times {10}^6}{E}\right)}^{1.42}\ rechts]{\mathrm{cm}}^{-1} $$ (1) $$ {\beta}_p=4.38\times {10}^6\exp \left[-{\left(\frac{1.14\ mal {10}^7}{E}\right)}^{1.06}\right]{\mathrm{cm}}^{-1} $$ (2)Der Absorptionskoeffizient (∂) in Bezug auf verschiedene Wellenlängen (λ) für 4H-SiC-Material wird durch die folgende Gl. (3) [26]:
$$ \partial =-790.3+18.2\uplambda -0.17{\uplambda}^2+8.57\mal {10}^{-4}{\uplambda}^3-2.39\mal {10}^{-6}{ \uplambda}^4+3,53\times {10}^{-9}{\uplambda}^5-2,16\times {10}^{-12}{\uplambda}^6 $$ (3)Die anderen in den numerischen Modellen verwendeten Materialparameter sind an anderer Stelle zu finden [27]. Die Berechnungen basieren auf der Finite-Elemente-Methode, bei der die Benutzer die Netzverteilungen richtig anpassen müssen, um genaue Berechnungen durchführen zu können.
Ergebnisse und Diskussionen
Einfluss der Strukturparameter der ohmschen Kontaktschicht vom n-Typ auf die photoelektrische Leistung
Um die Wirkung der Dicke und Dotierungskonzentration für die ohmsche Kontaktschicht vom n-Typ auf die photoelektrische Leistung zu untersuchen, entwerfen wir die Referenzvorrichtung, die Vorrichtungen L1 bis L4 bzw. die Vorrichtungen A1 bis A4. Beachten Sie, dass das Referenzgerät die grundlegende SACM-APD-Struktur ist, wie sie in 1a gezeigt ist. Andere vorgeschlagene APDs sind mit dem Referenzgerät identisch, mit Ausnahme der ohmschen SiC-Kontaktschicht vom n-Typ, deren detaillierte Strukturinformationen in Tabelle 1 aufgeführt sind.
Wir zeigen zunächst die Durchbruchspannung in Bezug auf die Dicke für die ohmsche SiC-Kontaktschicht vom n-Typ in Fig. 2a, d. h. die Bauelemente L1 bis L4. Der Einschub für Fig. 2a zeigt selektiv den Dunkelstrom, den Fotostrom bei einer Beleuchtung von 365 nm und die Verstärkung für das Gerät L1. Für Gerät L1 beträgt die Durchbruchspannung ~ 161,6 V und die Dunkelstromdichte bleibt auf dem Niveau von ~ 2,5 nA/cm 2 wenn die Vorspannung niedriger als 161,6 V ist. Beachten Sie, dass die Durchbruchspannung bei einem Strom von 10 –5 . erhalten wird A. Der Dunkelstrom nimmt zu, wenn der Stoßionisationsprozess auftritt. Der Photostrompegel wird im linearen Bereich hoch, wenn die 365-nm-Beleuchtung auf das Gerät scheint, und dies zeigt, dass die Multiplikationsverstärkung über 10 3 . liegen kann für Gerät L1 bei der Sperrspannung von 161,6 V. Die Avalanche-Durchbruchspannung für die fünf untersuchten APDs ist in Abb. 2a zusammengefasst. Aus Fig. 2a können wir entnehmen, dass die Dicke der ohmschen Kontaktschicht vom n-Typ einen vernachlässigbaren Einfluss auf die Durchbruchspannung hat. Um den zugrunde liegenden Mechanismus für die Beobachtungen aufzudecken, berechnen und zeigen wir die vertikale Verteilung des elektrischen Felds für das Referenzgerät und die Geräte L1 bis L4 in Abb. 2b, was veranschaulicht, dass die Ladungssteuerschicht die Grenze für die Verarmungsregion und das elektrische Feld in begrenzt die Multiplikationsschicht. Daher können wir spekulieren, dass die ohmsche Kontaktschicht vom n-Typ die elektrischen Feldprofile in der Multiplikationsschicht nicht beeinflusst, und dies wird in Fig. 2b bewiesen. Die Beobachtungen in Fig. 2b interpretieren die identische Durchbruchspannung in Fig. 2a für das Referenzgerät und die Geräte L1 bis L4 gut. Als Nächstes zeigen wir den fotogenerierten Strom für die fünf Geräte in Abb. 2c. Für eine bessere Auflösung sammeln wir den photogenerierten Strom bei einer Vorspannung von 100 V, die im Einschub für Abb. 2c gezeigt sind. Wir können sehen, dass der photogenerierte Strom mit zunehmender Dicke der ohmschen Kontaktschicht vom n-Typ abnimmt. Eine zu dicke ohmsche Kontaktschicht vom n-Typ führt dazu, dass die durch Licht erzeugten Ladungsträger eine nichtstrahlende Rekombination aufweisen und verringert entsprechend den Diffusionsstrom. Mit dem fotogenerierten Strom können wir die spektrale Empfindlichkeit für das Referenzgerät und die Geräte L1 bis L4 bei der Sperrspannung von 100 V in Abb. 2d erhalten. Die Peak-Response-Wellenlänge für die fünf untersuchten Geräte liegt im Zentrum bei 280 nm. Die Empfindlichkeit nimmt mit zunehmender Dicke der n-Typ-Kontaktschicht ab, was mit dem Einschub für Fig. 2c übereinstimmt. Daher fassen wir hier zusammen, dass die Dicke für die ohmsche Kontaktschicht vom n-Typ 4H-SiC angemessen dünn sein sollte, um die erhöhte strahlungslose Rekombination und den verringerten Diffusionsstrom zu vermeiden.

a Durchbruchspannung, b vertikale Verteilung des elektrischen Felds der SACM-APDs mit einer Vorspannung von − 160 V, c Photostrom-Spannungs-Eigenschaften unter 280 nm Beleuchtung und d spektrale Ansprechcharakteristiken der SACM-APDs mit einer Vorspannung von – 100 V für das Referenzgerät bzw. die Geräte L1 bis L4 mit unterschiedlichen Dicken der ohmschen Kontaktschicht vom n-Typ. Eingesetzte Figur in a zeigt die berechneten Strom-Spannungs-Kennlinien und die Multiplikationsverstärkung für das Gerät L1. Eingesetzte Figur in c zeigt den Photostrom für das Referenzgerät und die Geräte L1 bis L4 mit einer Vorspannung von – 100 V
Als Nächstes untersuchen wir die Durchbruchspannung als Funktion der Dotierungskonzentration in der ohmschen Kontaktschicht vom n-Typ, indem wir die Referenzvorrichtung und die Vorrichtungen A1 bis A4 in Fig. 3a analysieren. Der Einschub in Fig. 3a stellt den Dunkelstrom, den photogenerierten Strom und die Verstärkung in Bezug auf die angelegte Vorspannung für das Gerät A1 dar. Die Durchbruchspannung ist definiert, wenn der Strom 10 –5 . erreicht A. Gemäß Fig. 3a hängt die Durchbruchspannung kaum von der Dotierungskonzentration in der ohmschen 4H-SiC-Kontaktschicht vom n-Typ ab. Wie zuvor gezeigt wurde, kann die Ladungssteuerschicht den Verarmungsbereich und das elektrische Feld in der Vervielfachungsschicht wirksam begrenzen. Daher beeinflusst die Variation der Dotierungskonzentration in der ohmschen Kontaktschicht vom n-Typ nicht die Verteilung des elektrischen Felds innerhalb der Vorrichtung [siehe Abb. 3b]. Wir berechnen und zeigen dann den fotogenerierten Strom in Bezug auf die angelegte Vorspannung für das Referenzgerät und die Geräte A1 bis A4 in Abb. 3c. Aus Fig. 3c ist ersichtlich, dass die Dotierungskonzentration der ohmschen Kontaktschicht vom n-Typ einen vernachlässigbaren Einfluss auf den vorgespannten Fotostrom hat. Die spektrale Empfindlichkeit bei verschiedenen Wellenlängen für die fünf untersuchten Geräte ist in Abb. 3d dargestellt. Die Daten werden bei einer Sperrspannung von 100 V berechnet. Die Wellenlänge mit einer maximalen Empfindlichkeit von ~ 0,11 A/W beträgt 280 nm. In Übereinstimmung mit Fig. 3c hängt die Ansprechempfindlichkeit weniger von der Dotierungskonzentration in der ohmschen Kontaktschicht vom n-Typ ab. Daraus schließen wir, dass die Ansprechempfindlichkeit stärker von der Dicke beeinflusst wird als von der Dotierungskonzentration für die ohmsche Kontaktschicht vom n-Typ für 4H-SiC-SACM-APDs. Wir schlagen auch vor, die Trägerdiffusionslänge zu erhöhen, um die Ansprechempfindlichkeit zu erhöhen.

a Durchbruchspannung, b vertikale Verteilung des elektrischen Felds der SACM-APDs mit einer Vorspannung von − 160 V, c Photostrom-Spannungs-Eigenschaften unter 280 nm Beleuchtung und d spektrale Ansprechcharakteristiken der SACM-APDs mit einer Vorspannung von – 100 V für die Referenzvorrichtung bzw. die Vorrichtungen A1 bis A4 mit unterschiedlicher Dotierungskonzentration der ohmschen Kontaktschicht vom n-Typ. Eingesetzte Figur in a zeigt die berechneten Strom-Spannungs-Kennlinien und die Multiplikationsverstärkung für das Gerät A1. Eingesetzte Figur in c zeigt den Photostrom für das Referenzgerät und die Geräte A1 bis A4 mit einer Vorspannung von – 100 V
Einfluss der Strukturparameter der Absorptionsschicht auf die photoelektrische Leistung
In diesem Abschnitt wird der Einfluss der Dicke und der Dotierungskonzentration der Absorptionsschicht auf die photoelektrische Leistung von 4H-SiC-basierten SACM-APDs untersucht. Die detaillierten Strukturinformationen der Absorptionsschicht für SACM-APDs sind zusammengefasst und in Tabelle 2 gezeigt. Die Vorrichtungen M1 bis M4 und die Vorrichtungen B1 bis B4 sind mit Ausnahme der Absorptionsschicht strukturell identisch mit der Referenzvorrichtung. Die Bauelemente M1 bis M4 haben unterschiedliche Dicken, während die Bauelemente B1 bis B4 verschiedene Dotierungskonzentrationen für die Absorptionsschicht besitzen.
Unter Verwendung der Referenzvorrichtung und der Vorrichtungen M1 bis M4 zeigt Fig. 4a die Durchbruchspannung in Bezug auf unterschiedliche Dicken für die Absorptionsschicht. Zu Demonstrationszwecken berechnen und präsentieren wir den Dunkelstrom, den photogenerierten Strom und die Verstärkung als Funktion der angelegten Vorspannung für die Vorrichtung M1 im Einschub von Fig. 4a. Die Durchbruchspannung wird erfasst, wenn der Strom 10 –5 . beträgt A. Wir sehen, dass die Durchbruchspannung kaum von der Dicke der Absorptionsschicht abhängt. Es ist bekannt, dass die Durchbruchspannung stark von der elektrischen Feldstärke in der leicht dotierten Multiplikationsschicht abhängt, und daher zeigt Fig. 4b die vertikale Verteilung des elektrischen Felds für die fünf untersuchten Bauelemente bei einer Sperrspannung von – 160 V Feldverteilungen für das Referenzgerät und die Geräte M1 bis M4 sind genau gleich, was die Schlussfolgerung in Abb. 4a bestätigt. Anschließend demonstrieren wir den photogenerierten Strom und die Empfindlichkeit in den Abb. 4c bzw. d. Sowohl der photogenerierte Strom [siehe Einschub für Abb. 4c] als auch die Empfindlichkeit zeigen den Trend der Abnahme mit zunehmender Dicke der Absorptionsschicht. Um den zugrunde liegenden Mechanismus weiter anzugehen, berechnen und zeigen wir auch die Trägerverteilung innerhalb der Multiplikationsschicht in Abb. 4e, wenn die Sperrspannung für die fünf untersuchten Geräte 100 V beträgt. Wir können sehen, dass sowohl die Elektronen- als auch die Lochkonzentration mit zunehmender Dicke der Absorptionsschicht abnimmt, was der verstärkten strahlungslosen Rekombination zugeschrieben wird, wenn die Absorptionsschicht dicker wird. Die strahlungslose Rekombination verbraucht Ladungsträger, wodurch der Diffusionsstrom und die Ansprechempfindlichkeit unterdrückt werden. Um den Ladungsträgerverbrauch durch strahlungslose Rekombination zu vermeiden, schlagen wir hier vor, dass die Absorptionsschicht nicht zu dick sein darf, um 4H-SiC-SACM-APDs mit hoher Detektivität zu erhalten.

a Durchbruchspannung, b vertikale Verteilung des elektrischen Felds der SACM-APDs mit einer Vorspannung von − 160 V, c Photostrom-Spannungs-Kennlinie bei 280 nm Beleuchtung, d spektrale Ansprecheigenschaften und e Trägerkonzentrationsprofile in der Multiplikationsschicht der SACM-APDs mit einer Vorspannung von – 100 V für die Referenzvorrichtung bzw. die Vorrichtungen M1 bis M4 mit unterschiedlichen Dicken der Absorptionsschicht. Eingesetzte Figur in a zeigt die berechneten Strom-Spannungs-Kennlinien und die Multiplikationsverstärkung für das Gerät M1. Eingesetzte Figur in c zeigt den Photostrom für das Referenzgerät und die Geräte M1 bis M4 mit einer Vorspannung von – 100 V
Neben der Dicke der Absorptionsschicht hat auch die Dotierungskonzentration für die Absorptionsschicht einen signifikanten Einfluss auf die Leistungsfähigkeit des Bauelements. Anschließend berechnen und zeigen wir die Durchbruchspannung für das Referenzgerät und die Geräte B1 bis B4 in Abb. 5a. Die Durchbruchspannung ist definiert, wenn der Strom 10 –5 . beträgt A wie im Einschub von Fig. 5a gezeigt. Aus Fig. 5a ist ersichtlich, dass die Dotierungskonzentration für die Absorptionsschicht keinen signifikanten Einfluss auf die Durchbruchspannung hat. Es kann ferner durch die vertikalen eindimensionalen Verteilungen des elektrischen Felds in Fig. 5b nachgewiesen werden, sodass die Dotierungskonzentration für die Absorptionsschicht die elektrischen Feldprofile in der Multiplikationsschicht nicht signifikant ändert. Wir präsentieren auch den photogenerierten Strom bei der Wellenlänge von 280 nm für die untersuchten Bauelemente in Abb. 5c, was den verbesserten photogenerierten Strom anzeigt, wenn die Dotierungskonzentration in der Absorptionsschicht zunimmt. In guter Übereinstimmung mit Fig. 5c wird die wellenlängenabhängige Ansprechempfindlichkeit in Fig. 5d auch begünstigt, wenn die Dotierungskonzentration für die Absorptionsschicht zunimmt, z. B. Vorrichtung B4.

a Durchbruchspannung, b vertikale Verteilung des elektrischen Felds der SACM-APDs mit einer Vorspannung von − 160 V, c Photostrom-Spannungs-Eigenschaften unter 280 nm Beleuchtung und d spektrale Ansprechcharakteristiken der SACM-APDs mit einer Vorspannung von – 100 V für die Referenzvorrichtung bzw. die Vorrichtungen B1 bis B4 mit unterschiedlicher Dotierungskonzentration der Absorptionsschicht. Eingesetzte Figur in a zeigt die berechneten Strom-Spannungs-Kennlinien und die Multiplikationsverstärkung für das Gerät B1. Eingesetzte Figur in c zeigt Photostrom für das Referenzgerät und die Geräte B1 bis B4 mit einer Vorspannung von – 100 V
Um den tieferen Ursprung der erhöhten Ansprechempfindlichkeit für die Vorrichtung B4 zu zeigen, zeigen wir die Energiebandprofile für die Ladungssteuerschicht, die Absorptionsschicht und die ohmsche Kontaktschicht vom n-Typ für die Vorrichtungen B1 und B4 in den Fig. 1 und 2. 6a bzw. b. Hier ist es erwähnenswert, dass die Dotierungskonzentrationen für die Ladungssteuerschicht und die ohmsche Kontaktschicht vom n-Typ 5 × 10 18 . betragen cm −3 und 1 × 10 19 cm −3 , bzw. Daher kann die niedrigere Dotierungskonzentration für die Absorptionsschicht ein eingebautes elektrisches Feld erzeugen und die Energiebarrieren an den Grenzflächen Ladungssteuerschicht/Absorptionsschicht/n-leitende ohmsche Kontaktschicht erzeugen [28]. Die Energiebarrieren können die Diffusion der durch Licht erzeugten Ladungsträger in die Vervielfachungsschicht verzögern. Ein sehr bequemes Verfahren, mit dem die Barrieren verringert werden können, besteht darin, die Dotierungskonzentration in der Absorptionsschicht zu erhöhen. Als Ergebnis sind die effektiven Werte der Valenzbandbarriere ψ v für die Ladungssteuerschicht sind 513 meV und 480 meV für die Vorrichtungen B1 bzw. B4. Es zeigt sich, dass die erhöhte Dotierungskonzentration für die Absorptionsschicht den Transport für die photogenerierten Löcher fördert [siehe Abb. 6c]. Die Stoßionisation wird stark, sobald mehr fotogenerierte Löcher in den Multiplikationsbereich injiziert werden können, was entsprechend zu einem erhöhten fotogenerierten Strom und einer erhöhten Ansprechempfindlichkeit führt.
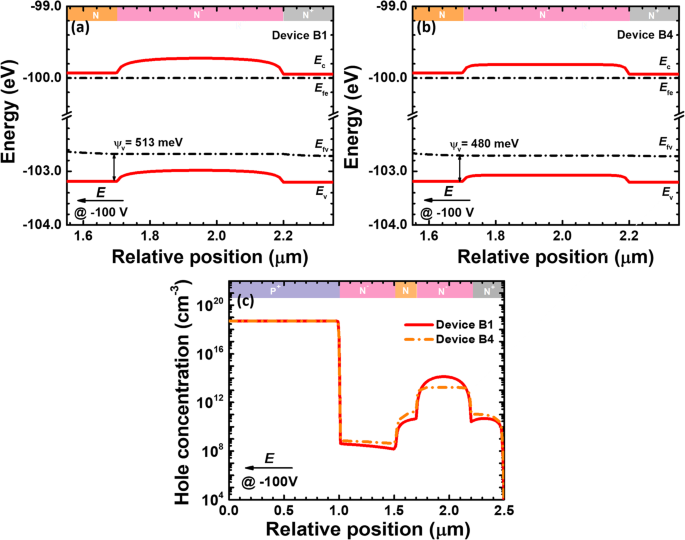
Energiebanddiagramme der Ladungskontrollschicht, der Absorptionsschicht und der ohmschen Kontaktschicht vom n-Typ für a Gerät B1 und b Gerät B4, c Lochkonzentrationsprofile unter 280 nm Beleuchtung für Vorrichtung B1 und B4. Die Daten werden bei einer Sperrspannung von 100 V
. berechnetEinfluss der Strukturparameter der Ladungskontrollschicht auf die photoelektrische Leistung
Um den Einfluss der Dicke und Dotierungskonzentration der Ladungskontrollschicht auf die photoelektrische Leistung zu untersuchen, legen wir unterschiedliche Architekturinformationen für die Ladungskontrollschicht fest, wie in Tabelle 3 gezeigt. Die Geräte N1 bis N4 und C1 bis C4 unterscheiden sich nur von Referenzgeräten in der Ladungskontrollschicht. Für die Bauelemente N1 bis N4 und C1 bis C4 werden unterschiedliche Dotierungskonzentrationen und Schichtdicken verwendet.
Wie bereits erwähnt, ist das elektrische Feld, das die Stoßionisation und den Lawinendurchbruch ermöglicht, hauptsächlich auf die Vervielfachungsschicht beschränkt. Die Durchbruchspannung als Funktion der Dicke für die Ladungssteuerschicht in Fig. 7a lässt darauf schließen, dass die Dicke der Ladungssteuerschicht einen sehr geringen Einfluss auf den Ladungsträgervervielfachungsprozess hat. Dies wird weiter durch die Darstellung von Fig. 7b bewiesen. Abbildung 7c zeigt den photogenerierten Strom in Bezug auf die angelegte Vorspannung für das Referenzgerät und die Geräte N1 bis N4. Der durch Licht erzeugte Strom wird niedrig, sobald die Dicke der Ladungssteuerungsschicht erhöht wird, was auch die geringere Ansprechempfindlichkeit mit zunehmender Dicke der Ladungssteuerungsschicht umsetzt. Wir führen auch die verstärkte strahlungslose Rekombination zu, die Ladungsträger verbraucht und den Diffusionsstrom unterdrückt.

a Durchbruchspannung, b vertikale Verteilung des elektrischen Felds der SACM-APDs mit einer Vorspannung von − 160 V, c Photostrom-Spannungs-Eigenschaften unter 280 nm Beleuchtung und d spektrale Ansprechcharakteristiken der SACM-APDs mit einer Vorspannung von – 100 V für das Referenzgerät bzw. die Geräte N1 bis N4 mit unterschiedlichen Dicken der Ladungssteuerschicht. Eingesetzte Figur in a zeigt die berechneten Strom-Spannungs-Kennlinien und die Multiplikationsverstärkung für das Gerät N1. Eingesetzte Figur in c zeigt den Photostrom für das Referenzgerät und die Geräte N1 bis N4 mit einer Vorspannung von – 100 V
Die Rolle der Ladungssteuerschicht besteht darin, das starke elektrische Feld und den Ladungsträgermultiplikationsprozess innerhalb der Multiplikationsschicht zu begrenzen. Die Breite des Verarmungsbereichs kann jedoch weiter ausgedehnt werden, solange die Dotierungskonzentration in der Ladungssteuerschicht abnimmt. Die Profile des elektrischen Felds können dann die Durchbruchspannung, den durch Licht erzeugten Strom, die Verstärkung und das Ansprechverhalten wesentlich beeinflussen. Daher entwerfen wir die Bauelemente C1 bis C4 in Tabelle 3. Gemäß Fig. 8a bleibt die Durchbruchspannung bei abnehmender Dotierungskonzentration zunächst gleich, und dann steigt die Durchbruchspannung, wenn die Dotierungskonzentration für die Ladungssteuerschicht unter 2 . liegt × 10 18 cm −3 . Der Einschub von Fig. 8a zeigt an, dass die Durchbruchspannung für die Vorrichtung C1 ~ 315 V beträgt, während der Dunkelstrom ebenfalls auf 3,5 × 10 –11 . ansteigt A verglichen mit dem für Gerät N1. Um den Ursprung für die Beobachtungen in Abb. 8a aufzudecken, berechnen wir die vertikale Verteilung des elektrischen Felds in Abb. 8b, die zeigt, dass das elektrische Feld hauptsächlich in der Multiplikationsschicht für die Referenzgeräte und die Geräte C3 und C4 konzentriert ist. Das elektrische Feld und der Verarmungsbereich dringen jedoch in die Ladungssteuerschicht ein, wenn die Dotierungskonzentration für die Ladungssteuerschicht niedriger als 2 × 10 18 . ist cm −3 . Die Erweiterung des Verarmungsbereichs für die Bauelemente C1 und C2 trägt dazu bei, die elektrische Feldstärke zu reduzieren und somit wird die Durchbruchspannung für die Bauelemente C1 und C2 entsprechend erhöht. Die vergrößerte Breite des Verarmungsbereichs führt zu mehr Raumladungserzeugungsstrom, was somit zu einem erhöhten Dunkelstrom führt, d. h. 3,5 × 10 – 11 A und 5 × 10 − 11 A für Geräte C1 bzw. C2. Wir zeigen dann den photogenerierten Strom bei der Wellenlänge 280 nm in Abb. 8c. The 100V-biased spectral responsivity curves at different wavelengths for the five investigated devices are illustrated in Fig. 8d. Excellent agreement is obtained between Figs. 8c and d, such that the increased photo-generated current gives rise to the enhanced responsivity, i.e., devices C1 and C2. Other devices show similar photo-current level and the responsivity.

a Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices C1 to C4 with different doping concentration of charge control layer, respectively. Inset figure in a shows the calculated current-voltage characteristics and the multiplication gain for device C1. Inset figure in c shows photocurrent-voltage characteristics for reference device and devices C1 to C4
As has been interpreted previously, the energy band barrier height at the interface of multiplication layer/charge control layer can soundly affect the carrier diffusion. Due to the expansion of the depletion region for devices C1 and C2, the electric field in the depletion region will annihilate the energy barrier at the interface of multiplication layer/charge control layer [e.g., the inset for device C1 in Fig. 9a]. Meanwhile, we observe the valence band barrier at the interface of multiplication layer/charge control layer for device C4 according to the inset for Fig. 9b. The energy barrier will correspondingly retard the hole diffusion into the multiplication layer from the charge control layer. We also selectively compute and show the hole concentration profiles for device C1 and C4 in Fig. 9c. Because the interface of multiplication layer/charge control layer for device C1 no longer hinders the injection of photo-generated holes into the multiplication layer, more holes are limited in the charge control layer and the absorption layer for device C4. As a result, the hole concentration in the multiplication layer for device C1 is higher than that for device C4. Thus, the enhanced photo-generated current and the responsivity for device C1 are obtained when compared with device C4.
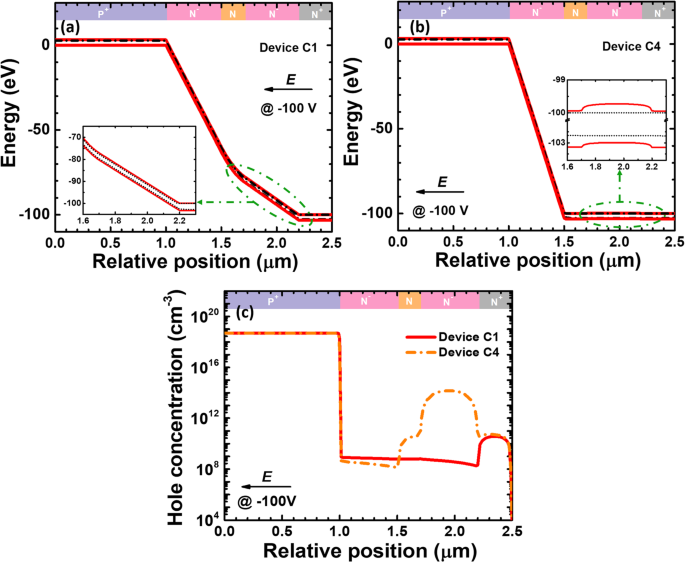
Energy band diagrams for a device C1 and b device C4, c hole concentration profiles for device C1 and C4. Data are calculated at the reverse voltage of 100 V. Insets for a und b show the local energy band diagrams for multiplication layer/charge control layer for devices C1 and C4, respectively
Impact of the Structural Parameters for the Multiplication Layer on the Photoelectric Performance
The impact ionization and the carrier multiplication process take place in the multiplication layer, making the design for the multiplication layer essentially vital for 4H-SiC SACM APDs. Therefore, we look into the impact of the thickness and doping concentration for the multiplication layer on the photoelectric performance for SACM APDs. The detailed structural information of the multiplication layer for different SACM APDs are summarized and presented in Table 4. The only difference for the devices in Table 4 lies on the multiplication layer.
As Fig. 10a presents, the breakdown voltage is enhanced from 110 to 210 V when the multiplication layer thickness is increased from 0.3 to 0.7 μm. For the purpose of demonstration, the inset of Fig. 10a demonstrates the current in terms of the voltage for reference device and devices P1 to P4. This indicates that a thick multiplication layer helps to reduce the electric field intensity [see Fig. 10b] and increase the breakdown voltage. We then show the photo-generated current for the five devices in Fig. 10c. The photo-generated current increases slightly with increasing the thickness of the multiplication layer for devices P2 to P4, except that device P1 has the highest photocurrent. The spectral responsivity characteristics for the five investigated devices at the reverse voltage of 100 V are provided in Fig. 10d. The peak responsivity for reference device and devices P2 to P4 improves slightly as the thickness of the multiplication layer increases, and this is because the number of carriers generated by impact ionization increases when the depletion region width increases. Note that device P1 with the thinnest multiplication layer owns the highest peak responsivity at the wavelength of 280 nm. This is because the − 100 V applied voltage is close to Geiger mode for device P1, and the avalanche gain is more likely to occur than that for other devices.

a Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices P1 to P4 with different thicknesses of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices P1 to P4. Inset figure in c shows photocurrent-voltage characteristics under 280 nm illumination for reference device and devices P1 to P4
Then, we show the breakdown voltage in terms of the multiplication layer doping concentration for reference device and devices D1 to D4 in Fig. 11a. It seems that when the doping concentration for the multiplication layer is lower than 10 16 cm −3 , the breakdown voltage is less affected. We believe the breakdown voltage can be significantly decreased if the doping concentration in the multiplication layer exceeds 10 18 cm −3 . The dark current as a function of the applied bias for the five APDs are shown in the inset of Fig. 11a. The dark current increases with increasing doping concentration of the multiplication layer due to the enhanced space charge generation in the depletion region. Therefore, for the purpose of significantly decreasing the dark current and promoting the carrier multiplication process, we rarely have the multiplication layer heavily doped. Then, we calculate the vertical one-dimensional electric field profiles for the five studied devices, which are demonstrated in Fig. 11b. We can see that the electric field profiles of the five devices are mainly confined in the multiplication layer. In addition, Figs. 11c and d demonstrate the photo-generated current and the wavelength-dependent responsivity for the five devices. We can see that the photo-generated current for reference device and devices D1 and D2 are almost the same under the 280 nm illumination, while that the photon-generated current for the devices D3 and D4 is slightly increased. Therefore, the responsivity at the wavelength of 280 nm in Fig. 11d for devices D3 and D4 is slightly higher than the others.

a Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent-voltage characteristics under 280 nm illumination, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices D1 to D4 with different doping concentration of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices D1 to D4. Inset figure in c shows photocurrent for reference device and devices D1 to D4 biased at − 100 V
Impact of the Beveled Mesa Angle on the Photoelectric Performance
In order to eliminate premature breakdown and suppress leakage current that are caused by the junction termination, positive beveled mesas with a small inclination angle are usually adopted when fabricating 4H-SiC APDs [13,14,15,16, 18]. However, the angles of the positive beveled mesa adopted in previous reports are various. Thus, to get systematic insight into the influence of different mesa inclination angles on the electric field profiles for 4H-SiC SACM APDs, we design the devices that are shown in Table 5.
We firstly calculate and show the dark current-voltage characteristics for the six investigated devices with the various bevel angles in Fig. 12a. We can see that the dark current increases as the positive beveled angle becomes large [see Fig. 12a]. The breakdown voltages for the investigated devices are ~ 161.6 V except that device E5 is slightly less than 161.6 V. The premature breakdown is observed as the beveled mesa angle increase in the dark condition. Meanwhile, we calculate and show photo-generated current in terms of the applied bias for reference device and devices E1 to E5 in Fig. 12b. We also see that the photo-generated current also increases as the positive bevel increases according to the inset for Fig. 12b. The premature breakdown is also observed as the beveled mesa angle increase in Fig. 12b. Therefore, the responsivity of solar-blind waveband at − 100 V slightly enhances as the positive bevel angle increases according to Fig. 12c.
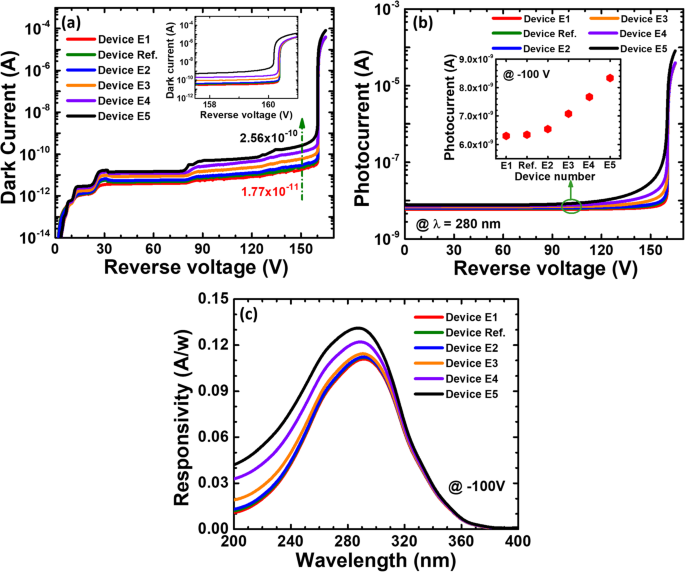
a Numerically calculated dark current-voltage characteristics, b photocurrent-voltage characteristics under 280 nm illumination, and c spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices E1 to E5, respectively
To reveal the origin for the observations in Figs. 12a and b, we calculate the lateral electric field distribution in the multiplication layer at the reverse bias of − 100 V in Fig. 13a, which demonstrates that, when the beveled mesas are utilized, the electric field decreases from the mesa center to the mesa edge. Moreover, the edge electric field intensity drops as the angle further decreases for the investigated devices. As has been mentioned, the junction termination will cause a large number of surface imperfections, which may cause the premature breakdown and the strongly leakage current, and the adopting of the beveled mesa shifts the premature breakdown from the mesa surface to the bulk [29]. Moreover, to get a full picture for the electric field profiles, the two-dimensional electric field distributions at the reverse bias of − 100 V for reference device and devices E1 to E5 are presented in Figs. 13b-g. We can see that the area of the high electric field in the entire multiplication layer gets narrowed, and this simultaneously causes the carriers that regenerated by impact ionization to decrease. As can be seen from Table 6, as the beveled mesa angle decreases, the surface electric field at the relative position of 700 μm decreases from 2.03 × 10 6 V/cm to 2.90 × 10 5 V/cm. As a result, the surface leakage and bulk leakage can be further suppressed as the beveled mesa angle get further decreased as shown in Fig. 12a. Although a small beveled mesa angle is preferred, this sacrifices the active detection area for APDs, and therefore, the responsivity is the lowest for device E1 according to Fig. 12c. Thus, one shall properly optimize beveled mesa angles depending on the crystalline quality for the 4H-SiC epitaxial layers and the surface conditions after junction termination. The suggested beveled angle in this works is in the range of 10–20°.
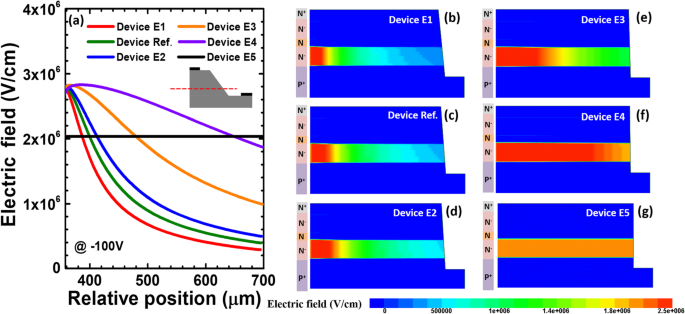
a Lateral electric field distribution of the multiplication layer at − 100 V, and numerically calculated two-dimensional electric field distribution at − 100 V for b device E1, c reference device, d device E2, e device E3, f device E4 and g device E5
Schlussfolgerungen
To summarize, we have numerically investigated and demonstrated the impact of the thickness and doping concentration of each layer on photoelectric performance for 4H-SiC SACM APDs. The obtained conclusions are as follows:(1) for n-type ohmic contact layer with a properly high doping concentration (N d ≈ 1 × 10 19 cm −3 ) to enable ohmic contact, the thickness and doping concentration hardly affect the breakdown voltage. Nevertheless, the responsivity decreases as the thickness of the n-type ohmic contact layer increases. The thickness shall be controlled to about 0.2 μm; (2) the doping concentration for the absorption layer is vitally important, which can modulate the photo-generated carrier transport and affect the responsivity. The doping concentration is generally controlled at the intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (3) the doping concentration for the charge control layer regulates the electric field distribution and affects the depletion region width for 4H-SiC SACM APDs. The depletion region width increases as the doping concentration of the charge control layer decreases. According to our results, when the doping concentration is about 1 × 10 18 cm −3 , the depletion region can be completely terminated by the charge control layer; (4) the breakdown voltage can be strongly affected by the thickness of multiplication layer which is the main support region of the electric field. The dark current is sensitive to the doping concentration of multiplication layer, and a low doping concentration for the multiplication layer is required, since the doping concentration therein influences the space charge generation current. Thus, the suggested doping concentration in this works is intrinsic concentration (N d ≈ 1 × 10 15 cm −3 ); (5) we also point out the advantage of beveled mesa for 4H-SiC SACM APDs, and the optimized beveled mesa angles shall be a compromise among the active detection area, the surface conditions for the mesa, and the crystalline quality for 4H-SiC epitaxial films. This work indicates that the optimum beveled mesa angle is in the range of 10–20°. We strongly believe that this work provides the physical insight for the device physics and hence the findings in this work are very important for 4H-SiC-based SACM APDs.
Verfügbarkeit von Daten und Materialien
The data and the analysis in the current work are available from the corresponding authors on reasonable request.
Abkürzungen
- AlGaN:
-
Aluminum gallium nitride
- APSYS:
-
Advanced Physical Models of Semiconductor Devices
- MSM:
-
Metal-semiconductor-metal
- SACM:
-
Separated absorption charge and multiplication
- SiC:
-
Silicon carbide
- SRH:
-
Shockley-Read-Hall
- UV APD:
-
Avalanche ultraviolet photodiode
Nanomaterialien
- Eine fehlerhafte Wartungsstrategie beheben:PM-Optimierung und FMEA
- Demonstration eines flexiblen Graphen-basierten Biosensors für den empfindlichen und schnellen Nachweis von Eierstockkrebszellen
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Tauchbeschichtungsverfahren und Leistungsoptimierung für elektrochrome Drei-Zustands-Bauelemente
- Dielektrische Metaoberflächen höherer Ordnung für hocheffiziente Polarisationsstrahlteiler und optische Wirbelgeneratoren
- Frequenzmodulation und Absorptionsverbesserung von THz-Mikrobolometern mit Mikrobrückenstruktur durch spiralförmige Antennen
- Fast Effizienz-Droop-Free AlGaN-basierte UV-Licht emittierende Dioden mit einer speziell entwickelten Übergitter-Elektronenblockierschicht vom p-Typ für eine hohe Mg-Dotierungseffizienz
- Steuerungsladungskinetik von Zinn-Niobat-Photokatalysatoren:Schlüsselrollen der Phasenstruktur und der elektronischen Struktur
- PCB-Materialien und Design für Hochspannung
- VMC Machinery für Produktion und Effizienz



