Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
Zusammenfassung
In den letzten Jahren haben die Prozessanforderungen von Nanobauelementen zu einer allmählichen Verringerung der Größe von Halbleiterbauelementen und den daraus resultierenden nicht zu vernachlässigenden Seitenwanddefekten, die durch Ätzen verursacht werden, geführt. Da die plasmaunterstützte chemische Gasphasenabscheidung keine ausreichende Stufenabdeckung mehr bieten kann, werden die Eigenschaften der Atomlagenabscheidungs-ALD-Technologie verwendet, um dieses Problem zu lösen. ALD nutzt selbstlimitierende Wechselwirkungen zwischen dem Vorläufergas und der Substratoberfläche. Wenn das reaktive Gas eine einzelne chemische Schicht bildet, die auf der Substratoberfläche adsorbiert ist, findet keine Reaktion zwischen ihnen statt und die Wachstumsdicke kann kontrolliert werden. Auf dem Å-Niveau kann es eine gute Stufenabdeckung bieten. In dieser Studie wurden aktuelle Forschungsergebnisse zur ALD-Passivierung von Mikro-Leuchtdioden und oberflächenemittierenden Lasern mit vertikaler Kavität überprüft und verglichen. Es wurde gezeigt, dass mehrere Passivierungsmethoden zu einer verbesserten Lichteffizienz, reduzierten Leckage und verbesserter Zuverlässigkeit führen.
Einführung
Die Entwicklung der Atomlagenabscheidungstechnologie (ALD) begann in den 1970er Jahren. 1977 beantragte Dr. Tuomo Suntola aus Finnland offiziell das erste Patent für die ALD-Technologie [1]. Zwischen 1983 und 1998 wurde die ALD-Technologie bei der Herstellung elektronischer Displays am Flughafen Helsinki in Finnland eingesetzt. Ende der 90er Jahre wurden durch die Einführung des ALD-Verfahrens in der Halbleiterindustrie erhebliche Forschungs- und Entwicklungsgelder sowie Manpower investiert, die maßgeblich zum rasanten Wachstum der ALD-Verfahrenstechnik beitrugen. Im Jahr 2007 nutzte Intel die ALD-Prozesstechnologie, um ein Hafniumdioxid (HfO2 ) Gate-Passivierungsschicht, die auf einen Metalloxid-Halbfeldeffekttransistor auf einem 45 nm-Mikroprozessor aufgebracht wurde, um die Bedeutung der ALD-Prozesstechnologie in der Halbleiterindustrie weiter zu festigen [2].
ALD basiert auf chemischen Oberflächenreaktionen [3] und zeichnet sich durch eine ausgezeichnete Dickengenauigkeit auf atomarer Ebene, eine großflächige hohe Gleichmäßigkeit und eine Konformität des Films auf der Struktur mit einem hohen Aspektverhältnis aus. Im Gegensatz zur herkömmlichen chemischen Gasphasenabscheidung (CVD) oder physikalischen Gasphasenabscheidung (PVD), wie in Abb. 1 gezeigt, verwendet der ALD-Prozess normalerweise zwei verschiedene chemische Vorstufen. Diese werden zu unterschiedlichen Zeiten in die Reaktionskammer geleitet, um zwei Halbzyklusreaktionen zu bilden, und alle chemischen Reaktionen werden durch Chemisorption auf die Oberfläche beschränkt. Diese zwei Halbzyklusreaktionen, die einen ALD-Zyklus bilden, der die Abscheidung eines einschichtigen Films erleichtert, können Schicht für Schicht wiederholt werden, um den Film zu wachsen. Diese chemischen Oberflächenreaktionen laufen unter den Bedingungen einer selbstlimitierenden Reaktion ab, dem ALD-Prozessfenster. Die Verwendung von zwei Halbzyklusreaktionen zum Abscheiden des Films vermeidet die gleichzeitige Anwesenheit von zwei chemischen Vorläufern in der Reaktionskammer, und es wird ein Abscheidungsmodus wie CVD gebildet, wodurch die ALD-Technologie die Filmdicke und Gleichmäßigkeit präzise steuern kann [4, 5,6,7].

Schematische Darstellung von thermischer und plasmaunterstützter ALD
Die Wachstumsrate von ALD-Filmen wird durch das Wachstum pro Zyklus (GPC) ausgedrückt [8, 9]. Im Allgemeinen reicht die Dicke des GPC von 0,05 bis 0,1 nm. Die Wahl der chemischen Vorstufen beeinflusst die Qualität des Films, seine Wachstumsgeschwindigkeit und die für den Prozess benötigte Zeit. Das ALD-Abscheidungsverfahren besteht aus vier aufeinanderfolgenden Schritten:Puls A, Clean A, Puls B und Clean B. Puls A besteht aus metallischen Vorläuferdämpfen und Puls B besteht aus nichtmetallischen Vorläuferdämpfen. Inaktive Gase wie Stickstoff oder Argon und Vakuumpumpen werden verwendet, um während der Reinigung A und der Reinigung B gasförmige Reaktionsnebenprodukte und restliche Reaktionsmittelmoleküle aus dem Reaktionsraum zu entfernen. Die Abscheidungssequenz umfasst mindestens einen Abscheidungszyklus. Der Abscheidungszyklus wird wiederholt, bis die Abscheidungssequenz einen Film gewünschter Dicke erzeugt hat.
Die selbstlimitierende Reaktion bildet den Kern der ALD [10,11,12,13]. Das Einstellen und Anpassen der Prozessparameter (wie Prozesstemperatur, Auswahl chemischer Vorläufer, Dosierung usw.), damit die chemische Oberflächenreaktion den selbstlimitierenden Zustand erreicht, ist der erste Schritt in der Entwicklung des ALD-Prozesses. Bei Erfüllung des ALD-Prozessfensters laufen alle chemischen Reaktionen an der Oberfläche ab und erfüllen die selbstlimitierenden Bedingungen. Wenn also in jedem ALD-Zyklus genügend chemische Vorläufermoleküle eingeführt werden, hängt die Gesamtmenge der an der chemischen Oberflächenreaktion beteiligten chemischen Vorläufer von der Anzahl der oberflächenreaktiven Gruppen ab. Wenn die Prozesstemperatur auf einem Niveau kontrolliert wird, bei dem die chemischen Vorläufermoleküle nicht im Bereich der physikalischen Adsorption und des autothermischen Crackens liegen, kann eine Atomschicht in jedem ALD-Zyklus gleichmäßig auf allen Substratoberflächen abgeschieden werden. Folglich weist die ALD-Technologie eine ausgezeichnete Gleichmäßigkeit und Anpassungsfähigkeit auf und kann die Dicke des Films reduzieren. Die Genauigkeit der Steuerung ist ein Schlüsselfaktor auf atomarer Ebene [14,15,16,17].
Die wichtigste Anwendung von ALD liegt im Bereich der Halbleiter [18,19,20,21,22], wie die Herstellung von High-k-Dielektrika, Metalldünnfilmen, Kupferbarrierefilmen und Ätzstoppschichten für Finnenfeld- Effekttransistoren (FinFETs) [23,24,25,26,27,28], Oxidpassivierungsschichten und Antireflexionsschichten für LEDs und VCSELs. Die sehr gleichmäßige Abdeckung und die Filmeigenschaften von hoher Dichte machen ALD für Geräte geeignet, die empfindlich auf Wasser und Sauerstoff reagieren. Daher hat sich ALD zum besten Beschichtungswerkzeug für Schutzschichten von Geräten entwickelt, die eine hohe Zuverlässigkeit erfordern. Die Wasserdampfdurchlässigkeitsrate (WVTR) ist ein wichtiger Indikator zur Messung der Beständigkeit der Folie gegenüber Wasser und Sauerstoff, insbesondere für flexible organische Leuchtdioden (OLED)-Displays, die wasserdampfempfindlich sind [29,30,31, 32,33,34,35,36,37]. Der Wert muss 10 −4 . erreichen g/m 2 -Tag oder weniger. Bei anderen Hochleistungs-VCSELs, Leistungsgeräten und High-End-LEDs muss deren WVTR mindestens weniger als 10 −3 . betragen g/m 2 -Tag, um die Zuverlässigkeit in rauen Umgebungen zu gewährleisten. Daher haben diese Geräte damit begonnen, ALD-Passivierung zu verwenden, um ihre Stabilität sicherzustellen [38,39,40,41,42,43,44]. Neben den oben genannten Anwendungen nutzen auch Photovoltaik [45,46,47], Lithiumbatterien [48,49,50], Brennstoffzellen und Mikroelektromechanische Systeme (MEMS) viele ALD-Prozesse [6, 51, 52,53]. In diesem Artikel konzentrieren wir uns auf die Auswirkungen von ALD-Technologien auf die Geräteleistung und betrachten den Fall von VCSELs. Darüber hinaus bietet dieser Artikel einen Überblick über ALD-Prozesse zur Verbesserung der Leistung von VCSELs.
ALD-Technologien für Mikro-LEDs
Die blau-grüne LED besteht hauptsächlich aus Materialien auf InGaN-Basis. Aufgrund seiner Kristallstruktur ist es ein piezoelektrisches Material. Es hat ein starkes eingebautes elektrisches Feld, das die Emissionswellenlänge und die Ladungsträgerrekombinationseffizienz des aktiven Bereichs beeinflusst. Dieses Phänomen wird als quantenbegrenzter Stark-Effekt (QCSE) bezeichnet und ist einer der Hauptgründe für die Lichtausbeute von LEDs [54]. Daher nutzte das Forschungsteam die Eigenschaften des QCSE über eine ringförmige Nanostruktur auf einem grünen Epitaxiewafer. Die Herstellung der Struktur löst die Spannung im aktiven Bereich der LED, um eine Wellenlängenmodulation zu erreichen. Es moduliert die Emissionswellenlänge von Grün nach Blau, da die Nanostruktur einen Teil der Leuchtfläche opfert und die Lichtstärke reduziert [55]. Abbildung 2 zeigt eine schematische Darstellung der Mikro-LED (μ-LED). Mit abnehmender Größe der μ-LED wirken sich die Seitenwanddefekte stärker auf den Wafer aus, was zu einer Abnahme der Lichtausbeute des Chips führt [56,57,58]. Die Passivierung in Mikro-LEDs erfolgt in der Regel durch plasmaunterstützte chemische Gasphasenabscheidung (PECVD), die wasserstoffbasierte Vorstufen verwendet, um schnelle Abscheidungsraten zu erzielen [30, 32]. ALD wird für LEDs in Mikrogröße bevorzugt. Im Vergleich zu den durch PECVD abgeschiedenen Passivierungsschichten ist ALD in der Lage, sehr kompakte dielektrische Filme mit Dicken im Nanometerbereich abzuscheiden. ALD bietet einen vielversprechenden Ansatz für die Passivierung von μ-LEDs, indem es kompakte und dichte dielektrische Filme zusammen mit einer besseren Kontrolle über die Filmdicke bietet. Daher haben viele Forschungsteams die ALD-Dünnschicht-Passivierungsschutztechnologie eingeführt, um das traditionelle PECVD-Verfahren zu ersetzen. F Köhler et al. haben berichtet, dass Standard-PECVD einen Film bei mäßigen Temperaturen (400 °C) abscheiden kann, jedoch unter starken Belastungseffekten leidet. ALD hat den Vorteil einer guten Konformität bei niedrigen Temperaturen. Darüber hinaus zeigt ALD eine überlegene Wafer-to-Wafer- und In-Wafer-Gleichmäßigkeit [59,60,61]. Darüber hinaus berichtete Milojevic [38], dass der Anstieg des Leckstroms bei kleineren μ-LEDs auf die dielektrische Qualität von PECVD zurückzuführen sein könnte. Dieser Anstieg zeigte, dass die PECVD-Seitenwandpassivierung nicht ausreichte, um den Leckstrom für μ-LEDs mit großem Umfang/Fläche-Verhältnis zu reduzieren; Nakamuraet al. haben die optoelektronischen Effekte der Seitenwandpassivierung auf Μicro-LEDs unter Verwendung von ALD und PECVD untersucht, und diese Ergebnisse zeigten auch, dass ALD für die Verstärkung der optischen und elektrischen Effekte vorteilhafter ist [62]. Die ALD-Passivierungsschutzschicht weist eine hohe Dichte, eine hohe Stufenabdeckung, eine effektive Fehlerreparatur und andere Merkmale auf, die verhindern, dass Ladungsträger durch Fehler auf der Oberfläche des Geräts eingefangen werden. Dadurch steigt die Lichtstärke des Geräts stark an, was zu einer verbesserten Effizienz führt [44, 55, 60, 63,64,65,66,67].
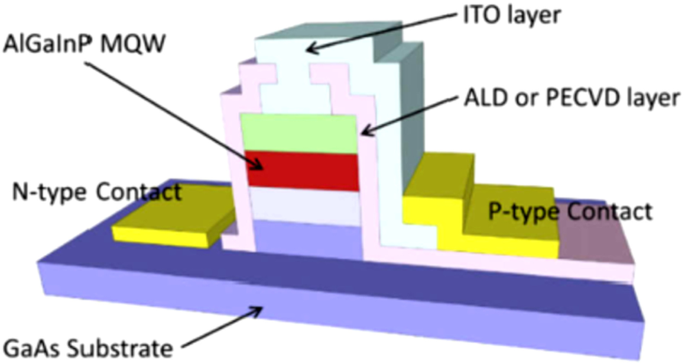
Schema einer μ-LED [67]
Unter Berücksichtigung des Einflusses der durch PECVD und ALD gewachsenen Passivierungsschutzschicht auf den Ableitstrom zeigt Abb. 3 die Ableitstromdiagramme der roten μ-LED nach PECVD- und ALD-Passivierungsschutz [66,67,68]. Es wird beobachtet, dass der durchschnittliche Leckstrom des Geräts, das ALD verwendet, viel niedriger ist als der, der mit PECVD erhalten wird. Außerdem steigt der Leckstrom gleichmäßig an, wenn die Komponentengröße verringert wird, aufgrund der Erhöhung des Oberflächen-Volumen-Verhältnisses der kleinen Bauelemente und des zusätzlichen Leckpfads unter Sperrspannung.
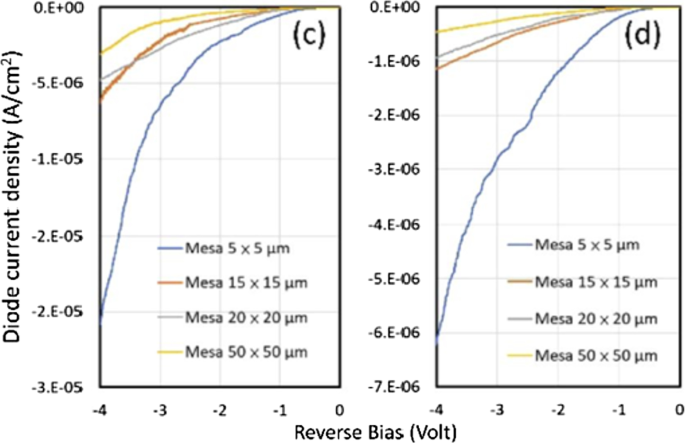
Reverse Bias J-V-Kurven von a PECVD-Proben und b ALD-Beispiele [68]
Um den Einfluss der Passivierungsschutzschicht auf die optische Leistung der Rotlicht-μ-LED zu veranschaulichen, vergleicht Abb. 4 die optische Leistung der PECVD- und ALD-Passivierungsschutzschichten für verschiedene Größen und Stromdichten. Es ist ersichtlich, dass die optische Leistung der PECVD- und ALD-Passivierungsschichten bei einer Komponentengröße über 15 µm zufriedenstellende Werte erreichen kann, aber wenn die Komponentengröße weniger als 5 µm beträgt, übertrifft ALD den von PECVD bereitgestellten Passivierungsschutz. Beim Vergleich zwischen Geräten mit unterschiedlichen Beschichtungen und unterschiedlichen Stromstärken kann ein dramatischer Abfall der integrierten optischen Leistung beobachtet werden. Bei gleicher Stromdichte und unterschiedlichen Größen beträgt der Unterschied in der optischen Leistung von ALD das 570-fache, während die Komponenten, die PECVD verwenden, sogar das 850-fache betragen. Dies zeigt, dass ALD immer noch eine hervorragende Passivierung für kleine Bauteile bietet. Die Schutzschicht ermöglicht die kontinuierliche Unterdrückung von Oberflächendefekten und erhöht die Strahlungsrekombinationseffizienz. Darüber hinaus erhöht der von ALD bereitgestellte Passivierungsschutz die Zuverlässigkeit des Geräts. Da der Trockenätzprozess Schäden und Defekte an den Seitenwänden verursachen kann, kann die Auswirkung der Seitenwanddefekte proportional zunehmen, wenn die Größe der Vorrichtung verringert wird, was zu einer vorzeitigen Leistungsverschlechterung führt. Daher ist die Qualität der Passivierungsschicht besonders wichtig. Die obigen Ergebnisse zeigen, dass die durch die ALD-Passivierung geschützten Geräte mit abnehmender Größe des Geräts unter verschiedenen Bedingungen besser funktionieren. In zukünftigen fortschrittlichen Herstellungsprozessen wird die ALD-Technologie voraussichtlich weiterhin eine wichtige Rolle spielen.
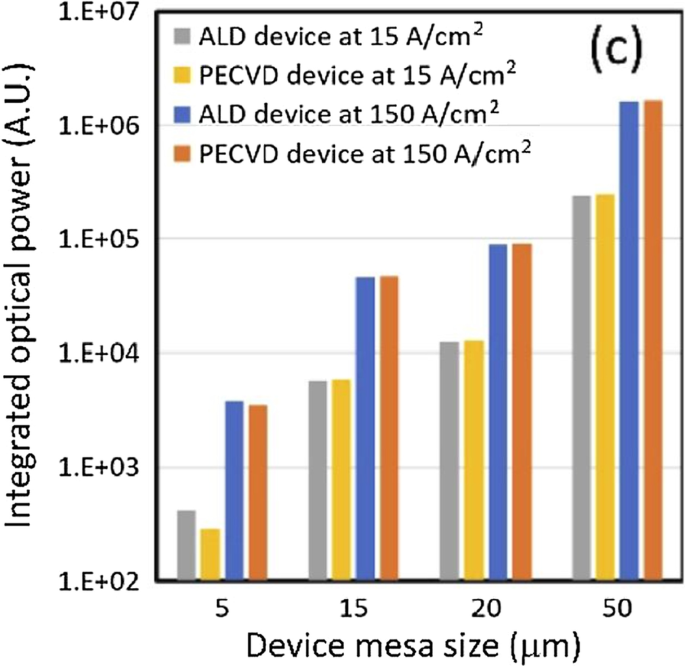
Integrierte spektrale Intensität zwischen ALD- und PECVD-Proben bei hohen/niedrigen Stromdichten [68]
Unter Berücksichtigung des Einflusses der EQE ermittelte die vorliegende Studie das Vorhandensein einer Passivierungsschicht an der Seitenwand und verglich die Auswirkungen der durch ALD und PE-CVD erzeugten Passivierungsschichten auf die EQE wie folgt:LED-1:μ-LED nicht ausgesetzt zur Seitenwandpassivierung; LED-2:μ-LED, die einer Passivierung der ALD-Seitenwand und einem induktiv gekoppelten Plasmaätzen unterzogen wurde; LED-3:μ-LED, die einer Passivierung der PE-CVD-Seitenwand und einer HF-Ätzung unterzogen wurde; LED-4:μ-LED, die einer Passivierung der ALD-Seitenwand und einer HF-Ätzung unterzogen wurde. Abbildung 5a, b zeigt die EQEs, die für 100 × 100 μm 2 . erhalten wurden und 20 × 20 μm 2 Vorrichtungen, um die Auswirkungen unterschiedlicher Seitenwandpassivierungstechniken zu veranschaulichen. Alle passivierten 100 × 100 μm 2 μ-LEDs hatten einen ähnlichen Peak-EQE (LED-1, 40%; LED-2, 36%; LED-3, 38%; und LED-4, 41%). Aufgrund des kleinen Perimeter-Flächen-Verhältnisses hatte die Beschädigung der Seitenwand nur einen geringen Einfluss auf die Geräteleistung. Daher beeinflusste die Seitenwandpassivierung große μ-LEDs nicht signifikant. Darüber hinaus wird die EQE bei größeren Geräten weniger von Seitenwandschäden beeinflusst und verbessert sich nicht mit Seitenwandpassivierung. Für 100 × 100 μm 2 Probe, ungeachtet des verwendeten Seitenwandpassivierungsverfahrens, variierte der EQE-Abfall, obwohl der maximale EQE konstant blieb. Für μ-LEDs mit einer Fläche von 20 × 20 μm 2 , betrug der mit und ohne ALD-Passivierung erreichte EQE 33% bzw. 24%. Dieses Ergebnis wird den kombinierten Effekten von verbesserter Lichtextraktion, Oberflächenreorganisation und reduziertem Leckstrom aufgrund von Seitenwandschäden zugeschrieben.
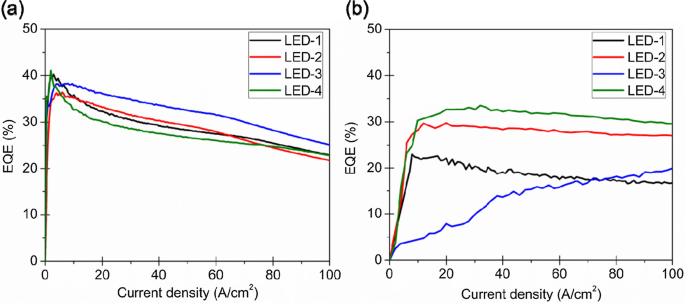
Abhängigkeit der EQE vom Strom für a 100 × 100 μm 2 und b 20 × 20 μm 2 Geräte mit unterschiedlichen Methoden der Seitenwandpassivierung [63]
Folglich hat die μ-LED-Technologie großes Potenzial, das Geschäft mit Festkörperbeleuchtung zu verändern, und sie wird sicherlich eine bahnbrechende Displaytechnologie sein. Die Passivierung der Seitenwände ist unerlässlich, um die für eine hohe Leistung erforderliche Zuverlässigkeit bei weiterer Reduzierung der Größe des Geräts aufrechtzuerhalten. Im Allgemeinen ist ALD eine Schlüsseltechnik zur Durchführung einer Seitenwandpassivierung, um einen Abfall der Effizienz von μ-LEDs zu verhindern, da ihre charakteristische Größe aufgrund des Leckstroms auf den Mikromaßstab reduziert wird [69].
ALD-Technologien für VCSEL
Oxid-VCSELs haben viele Vorteile, wie beispielsweise eine bessere Modalstabilität und geringer Jitter für Datenübertragungsanwendungen sowie geringe Kosten in nicht hermetischen Transceiver-Packages. Aufgrund der hohen Leistungsdichte des Lasers erfordert der Oxid-VCSEL jedoch auch mehr Schutzmethoden, um eine Veränderung der Lasereigenschaften zu verhindern.
Der VCSEL besteht aus drei Teilen:dem oben strahlenden Bragg-Reflektor (p-DBR), dem Hohlraum und dem unteren n-DBR. Der DBR besteht aus 20–40 Paaren dünner Filme. Der Hohlraum ist im Allgemeinen mehrere Mikrometer dick. Im Vergleich zur Verstärkungslänge des Seitenemitters ist die Verstärkungslänge der aktiven Schicht des VCSEL sehr klein (wenige zehn Nanometer). Um die stimulierte Emission von Strahlungslicht zu erhalten, muss der DBR ein sehr hohes Reflexionsvermögen aufweisen, damit eine stimulierte Emission von Strahlungslicht auftritt. Um die Eigenschaften von VCSELs zu verbessern, wurde ALD angewendet, um die Passivierungsschicht, den DBR, mehrere Quantentöpfe (MQWs) und sogar die transparenten Elektroden von VCSELs vorzubereiten.
ALD-Technologien für die Passivierungsschicht von VCSELs
ALD wurde zur Verbesserung der Zuverlässigkeit von Quantenpunkten und LCDs verwendet [31, 32, 70, 71], für die Passivierungsschicht von VCSEL kann der gleichmäßige und dichte Beschichtungsdünnfilm von ALD die Zuverlässigkeit erhöhen. Das Einfügen des dichten Films als Oxidpassivierungsschicht für VCSELs ist sehr wichtig, um den Hohlraum des VCSEL zu schützen. Früher wurden Schutzfolien üblicherweise mit PECVD plattiert. Jedoch ist normalerweise ein dicker Film erforderlich, um die Kompaktheit des Films beizubehalten, was eine übermäßige Belastung verursacht und die Zuverlässigkeit von VCSELs beeinträchtigt. ALD-Technologie kann Al2 . abscheiden O3 Dünnfilme mit ähnlichen Eigenschaften wie die Passivierungsschicht von VCSELs und der gleichförmige und dichte Beschichtungsdünnfilm können den Schutzchip vollständig isolieren. Daher wurde ALD verwendet, um PECVD als das beste Beschichtungsverfahren für die Passivierungsschichten von VCSELs zu ersetzen.
Die Zuverlässigkeit der Oxid-VCSELs war im 85/85 (85 °C und 85 % relative Luftfeuchtigkeit, RH) Test aufgrund der Oxidationsschicht aus AlGaAs mit höherer Al-Konzentration im Vergleich zu den DBR-Schichten sehr hoch. Eine höhere Al-Oxid-Öffnung führte zu einer Korrosionsdelamination an der Oxid-Halbleiter-Grenzfläche. Xieet al. zeigten, dass bei einem signifikanten Prozentsatz von Oxid-VCSELs, die Feuchtigkeit ausgesetzt waren, ein Versetzungswachstum, eine starke Rissbildung und eine Degradation der Öffnungsoberfläche auftraten [72]. Herricket al. beobachteten auch ähnliche Ausfälle durch Feuchtigkeitseinwirkung in einer 85/85-Kammer [73]. In den letzten zwanzig Jahren haben viele Forscher und Unternehmen in die Forschung zur Verhinderung der Alterung von VCSEL-Elementen durch das Eindringen von Feuchtigkeit investiert und eine breite Palette von passiven Schutzfilmen und Layout-Designänderungen vorgeschlagen. Im Jahr 2004 schlug Agilent Technologies beispielsweise vor, Löcher zu ätzen und in das Polymer zu füllen, um Feuchtigkeitseinwirkung zu verhindern [74]. Im Jahr 2006 schlug Debrabander das Verfahren zur Erkennung von Löchern durch Mesa-Passivierungsfilme vor [75], während TrueLight 2014 den SiON-Passivierungsfilm vorschlug [76]. Wir nennen hier nur einige Studien als Beispiele. In dieser Studie wurde hauptsächlich Al2 . verwendet O3 durch ALD gewachsene Filme und bildeten einen Komplex für feuchtigkeitsbeständige Passivierungsfilme mit PECVD-gewachsenem SiNx . Wir haben das Experiment entworfen und eine Vergleichsstudie durchgeführt, um die Verbesserung des 85/85-Testfehlers mit der ALD-Schicht zu zeigen, und die widerstandsfähigen feuchtigkeitsbeständigen dielektrischen Schichten der VCSEL-Struktur, die durch PECVD und ALD abgeschieden wurden, wurden als Gerät A bzw. Gerät B bezeichnet .
Abbildung 6 zeigt die Struktur des VCSEL, einschließlich n-Typ-DBR, MQW-Schichten, AlGaAs-Oxid-Aperturschicht mit hohem Al-Gehalt (~ 0,98) und p-Typ-DBR-Schichten. Die folgende Beschreibung bezieht sich auf die Etiketten. Die feuchtigkeitsbeständigen Passivierungsschichten wurden erst nach der Oxidation durch ALD auf der Seitenwand von Gerät B abgeschieden.
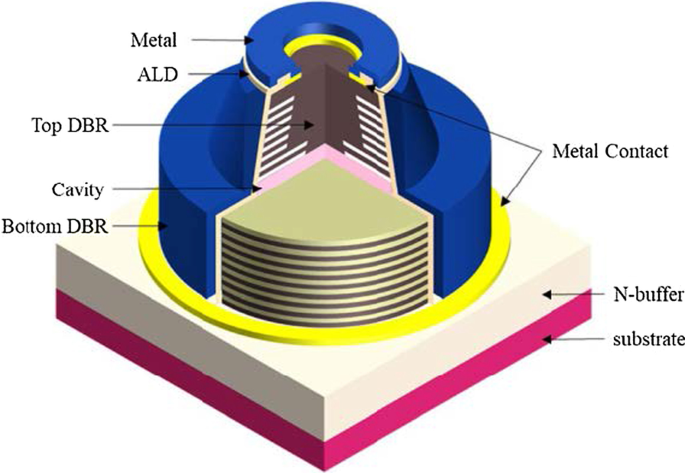
Schema des VCSEL [42]
Tabelle 1 zeigt den Vergleich von VCSELs in dieser Arbeit und anderen Gruppen. In dieser Arbeit wurden das LIV, S 21, Augendiagramm und die nasse Hochtemperaturbetriebslebensdauer (WHTOL) von VCSELs mit und ohne ALD untersucht, und diese Ergebnisse zeigen, dass ALD die photoelektrischen und Kommunikationseigenschaften von Hochtemperatur- Geschwindigkeits-VCSELs, aber verbessern Sie die Zuverlässigkeit von Hochgeschwindigkeits-VCSELs.
Wie in Abb. 7 gezeigt, wird die fehlerfreie 53 Gb/s-Übertragung bis zu 100 m in GI-Singlemode-Faser (SMF) unter Preemphasis-NRZ-OOK-Modulation mit dem 6 μm-Durchmesser der Oxidapertur in den wenigen . erreicht -Modus (FM) VCSEL. In dieser Arbeit wurde die ALD-Technik verwendet, um die Zuverlässigkeit von FM-VCSEL zu verbessern.

Augendiagramme von 53 Gb/s fehlerfreier Übertragung bis zu 100 m mit dem 6 μm-Durchmesser der Oxidapertur im VCSEL nach ALD
Die DC-, AC- und Übertragungsleistungen von Gerät B werden demonstriert. Abbildung 8a, b zeigen die Lichtstromkurve (L-I) und das Kleinsignal-Modulationsverhalten von Gerät B bei 25 °C. Abbildung 9 zeigt das Augendiagramm der Pulsamplitudenmodulation mit 4 Stufen (PAM4) bei 56 Gb/s unter einer Vorspannung von I . = 8 mA bei 25 °C. Abbildung 10a, b zeigt das Augendiagramm der On-Off-Keying (OOK) bei 28 Gbit/s unter einer Vorspannung von I = 8 mA von Gerät B bei 25 °C und 75 °C.
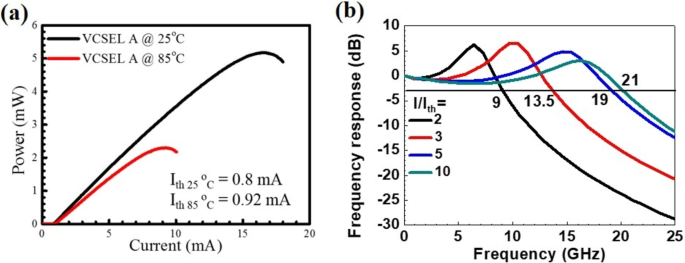
a Lichtstromcharakteristik eines 850 nm VCSEL bei 25 °C und 85 °C, b Kleinsignal-Modulationsantwort für Gerät B bei 25 °C

Augendiagramm des PAM4-Signals, das vom 850-nm-VCSEL mit 56 Gb/s unter einer Vorspannung von I . übertragen wird = 8 mA bei 56 Gb/s bei 25 °C
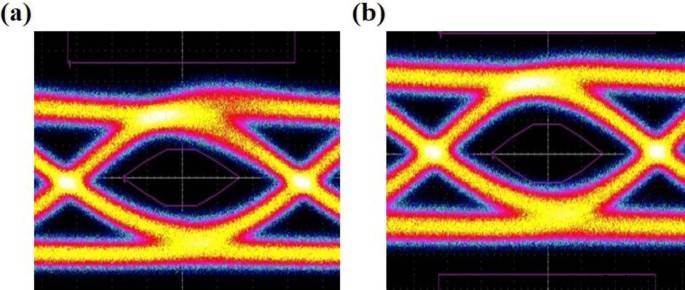
Augendiagramm des OOK-Signals, das vom 850 nm-VCSEL mit 28 Gb/s unter einer Vorspannung von I . übertragen wird = 8 mA bei a 25 °C und b 75 °C
Untersuchung der Verbesserung der Feuchtigkeitsbeständigkeit durch Passivierung des Al2 O3 ALD-Schicht wurden zwei mit dielektrischen Schichten beschichtete Bauelemente definiert. In Gerät A beschichtete die dielektrische Schicht nur SiNx , während es in Gerät B Al2 . beschichtete O3 ALD und SiNx zusammen. SiNx , Polyimid, SiNx , und Metallisierung wurden nacheinander abgeschlossen. 1. p-Metall bildete einen ohmschen Kontakt mit dem GaAs-Obermaterial. 2. p-Metall ist ein Bondpad-Metall. Die komplexen gestapelten Passivierungsfilme bedeckten die Mesa-Oberfläche in Gerät B effizient. Das Paket der alternden Geräte wurde in Open-Can-TO vorbereitet.
Die Umgebungsbedingungen für die Alterung waren 85 °C und 85 % relative Luftfeuchtigkeit, mit einer Vorspannung von 6 mA für die Betriebslebensdauer bei nassen Hochtemperaturen (WHTOL). Die Eingabemengen für die Geräte A und B betrugen 18 bzw. 18. Die Ergebnisse sind in Abb. 11 dargestellt. In Gerät A gab es fünf Fehlerchips, und Fehler wurden zufällig innerhalb von 500 h gefunden. Im Gegensatz zu Gerät B trat bis 960 h kein Fehler auf. Die Ergebnisse sind in Abb. 11a, b dargestellt. Diese Ergebnisse zeigen, dass das ALD-gezüchtete Al2 O3 ALD-Film hat eine bessere Einkapselung auf der Mesa-Seitenwand als nur der PECVD-gewachsene SiNx Folie zur Verhinderung des Eindringens von Feuchtigkeit.
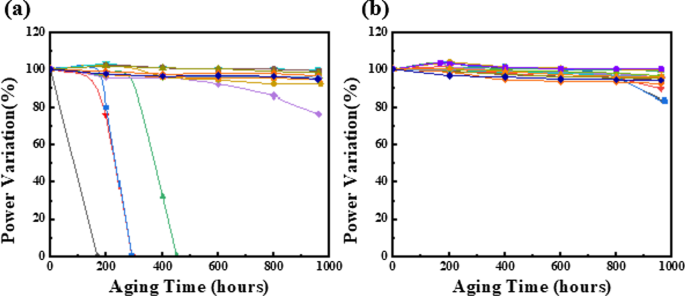
WHTOL-Leistung (85 °C/85% Luftfeuchtigkeit) von VCSEL-Chips, a Gerät A, nur SiNx als Passivierungsschicht, b Gerät B, Al2 O3 /SiNx als Passivierungsschichten
ALD-Technologien für den DBR von VCSEL
Der DBR der VCSEL-Abscheidung durch ALD hat den Vorteil einer guten Haftung mit Saphirsubstrat und einem guten Zustand an der Grenzfläche verschiedener dielektrischer Schichten von DBR [80]. Gemäß der Struktur des VCSEL wird die Kavität in vertikaler Richtung des Lasers durch zwei Gruppen von Spiegeln gebildet, die die aktive Schicht einklemmen, und das Licht wird zwischen dem p-DBR und n-DBR mehrmals reflektiert, bevor es sich in die Luft ausbreitet . Die Struktur des DBR besteht aus zwei Arten von Halbleitermaterialien mit unterschiedlichen Brechungsindizes, und die periodische Dicke des DBR sollte genau auf λ/4 (λ bezeichnet die Mittenwellenlänge) gesteuert werden. Die Design- und Wachstumsmethoden bilden die Grundlage für die Herstellung von hochreflektierendem DBR. Für einen hochwertigen DBR trägt der Phaseninterferenzeffekt zur Verstärkung des Lichts in der Kavität bei, während das hohe Reflexionsvermögen des DBR (> 99%) die Schwellenverstärkung und die Quanteneffizienz von VCSELs stark verbessern kann. Um eine hohe Reflektivität, ein breites Sperrband und einen sanften Phasengang zu erreichen, sollten die Perioden des DBR zwischen 20 und 40 liegen, und die bei seiner Herstellung verwendeten Materialien sollten einen großen Unterschied im Brechungsindex aufweisen. In diesem Fall haben viele Gruppen berichtet, dass AIAs/GaAs, Al2 O3 , HfO2 , SiO2 , etc. sind für das Wachstum von DBR geeignet.
Es gibt verschiedene Wachstumsmethoden für DBR, darunter Molekularstrahlepitaxie (MBE) und Metall-organische Gasphasenabscheidung (MOCVD). ALD ist jedoch auch eine präzise Wachstumsmethode für DBR. Da der durch ALD hergestellte DBR mit geringer Dicke, hohem Reflexionsvermögen und geringer Rauheit die Eigenschaften von VCSELs effektiv verbessern kann, haben viele Forscher Techniken zur Verbesserung des DBR unter Verwendung von ALD-Techniken untersucht. 1997 schlug Huffaker [81] beispielsweise vor, dass die Dehnung aufgrund des geringeren DBR durch die Verwendung von Alx . reduziert werden kann O1-x Schichten, deren Dicke geringer war als die einer Viertelwelle. Im Jahr 2013 haben Guo et al. [82] berichteten, dass der durch den ALD-Prozess hergestellte DBR eine bessere Qualität aufweist als der durch den EBE-Prozess hergestellte, und dass die ALD-Prozesszeit fast gleich der des EBE-Prozesses oder sogar noch kürzer ist. Um einen DBR zu züchten, der aus mindestens zwei oder mehr Materialarten besteht, ist es außerdem im Allgemeinen notwendig, die Temperatur beim EBE-Verfahren häufig zu erhöhen und zu senken, während die Temperatur beim ALD-Verfahren zum Abscheiden unterschiedlicher Materialien gleich gehalten werden kann. Im Jahr 2017 berichtete Liu [83], dass die ALD-Methode angewendet werden könnte, um qualitativ hochwertige Schichten mit scharfer Grenzfläche und guter Gleichmäßigkeit herzustellen. Somit eignet sich ALD zum Abscheiden von hochwertigem DBR.
Sakai et al. schlugen die On-Wafer-Fertigung von UV-C-Laserdioden (LDs) mit geätztem Spiegel mit einem ALD-abgeschiedenen DBR vor, die zur Verringerung der Laserschwellenstromdichte beitragen. In dieser Studie wurden vier Perioden HfO2 und Al2 O3 wurden mit ALD für den DBR hinterlegt. Al2 O3 wurde als Material mit niedrigerem Brechungsindex ausgewählt, da seine Abscheidungsrate bemerkenswert höher ist als die von SiO2 . Abbildung 12 zeigt das TEM-Bild des von ALD abgeschiedenen DBR, das die hervorragende Dicke und Qualität von DBR zeigt.
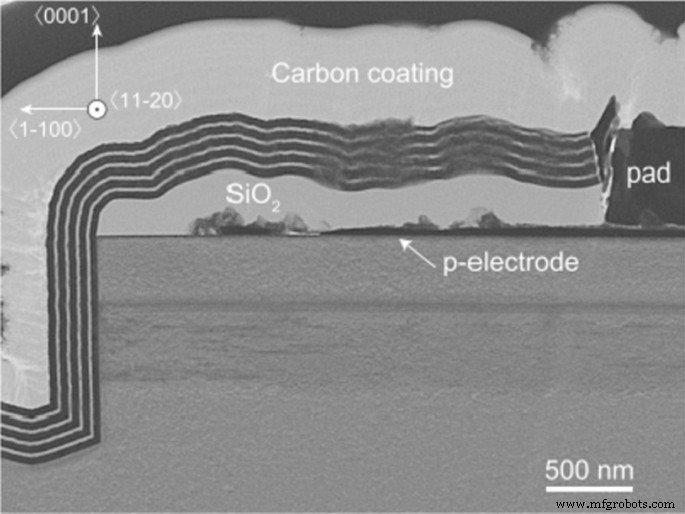
TEM-Bild des mit ALD hinterlegten DBR [84]
Die MOCVD-Technik wird wegen vieler Vorteile, wie der präzisen Wachstumssteuerung des Films und der Abscheidung eines qualitativ hochwertigen Films, bei der Abscheidung von DBR weit verbreitet verwendet. Im tatsächlichen Herstellungsprozess wird jedoch der Grenzflächenzustand an der Grenzfläche verschiedener dielektrischer Schichten von DBR beeinflusst; andernfalls würde das Entwurfsverfahren des DBR eine komplexe Optimierung erfordern, wie beispielsweise die Abscheidung einer weiteren zusätzlichen Pufferschicht an der Grenzfläche verschiedener dielektrischer Schichten. Abbildung 13a zeigt die Berechnung der Transfermatrixmethode (TMM) für das Reflexionsvermögen von DBR mit MOCVD ohne Einfügen einer Pufferschicht. Die Reflektivitätsspektren von HfO2 /Al2 O3 Mit ALD abgeschiedene DBR stimmen eher mit dem berechneten TMM-Spektrum in Abb. 13b [85] überein. In diesem Fall kann die ALD-Technik DBR mit einer besseren Grenzfläche zwischen verschiedenen dielektrischen Schichten im Vergleich zu MOCVD abscheiden (Abb. 14).
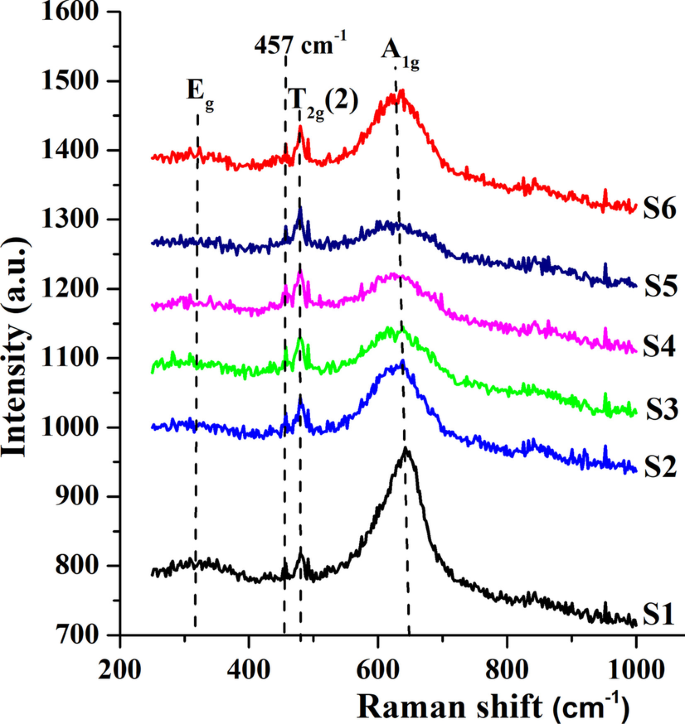
Gemessene und berechnete Reflexionsspektren des entworfenen DBR, abgeschieden mit a MOCVD, b ALD [84, 85]
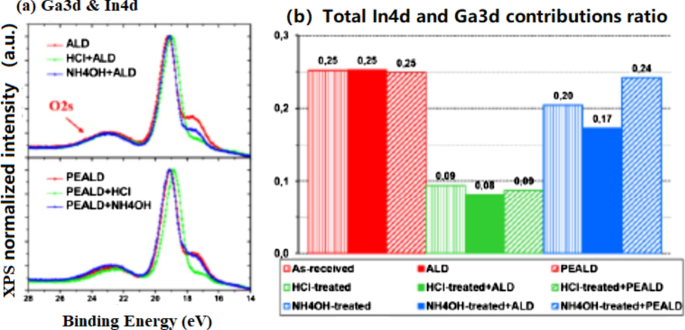
a Überlagerung normalisierter Ga3d-In4d-Spektren für ALD- und PEALD-Proben ohne, mit HCl oder mit NH4 OH-Oberflächenbehandlung, b Ga3d-In4d-Verhältnisse für dieselben Proben im Vergleich zu Al2 O3 freie Oberflächen [86]
ALD-Technologien für die mehreren Quantenquellen von VCSELs
Owing to the high requirement for optical gain in VCSELs, most devices use MQWs as the active region. In general, when the MQW period increases to a certain value, the threshold current density of the VCSEL is mainly caused by the following three factors. First, for the width of the quantum well, the active region cannot overlap with the peak position of the waveform. The farther the quantum well from the peak position, the lower is its gain efficiency. Therefore, distant quantum well regions cannot play a significant role in improving the optical gain. Second, there is a direct proportional relationship between the total transmittance current and period of MQWs. The total transmittance current increases with the MQW period because the transmittance current is a part of the threshold current of the device. Therefore, the threshold current of the device will increase with the transmittance current. Third, as the current increases, the slope of the optical gain to current curve will decrease, increasing the threshold current of the device. Hence, thin MQWs with high crystalline quality and optical properties are promising candidates for realizing VCSELs.
For the MQWs of VCSEL, ALD can optimize the interface properties and surface recombination of MQWs [80, 83,84,85]. In the last several decades, methods for optimizing MQWs using ALD have been studied. In 2008, Lo et al. reported the successful growth of high-quality ultraviolet (UV) AlGaN/GaN MQWs structures using ALD [87]. In the same year, Bosund et al. [88] proposed that a thick TiN passivation layer deposited by ALD on top of InGaAs/GaAs can significantly increase the photoluminescence intensity and carrier lifetime of the MQWs, while Li et al. reported that a low dislocation density ultraviolet (UV) AlGaN/GaN MQW structure can be grown using the ALD technique. In 2019, Lee et al. [89] proposed that the emission intensity of the 860 nm GaAs VCSEL with SiN anti-reflection film was significantly increased (compared to the VCSEL without the SiN anti-reflection film) to improve the light extraction efficiency of a VCSEL. Here, we cite a few studies as examples.
A deep understanding of semiconductor–dielectric interface properties will provide guidelines for optimizing efficient passivation solutions for InGaN/GaN-based µ-LEDs. To this end, quantum well (QW) semiconductors are of tremendous interest because many surface recombinations are likely to occur at the edges of the LED active regions and are probably responsible for the low µ-LED efficiencies. Thus, Le Maoult et al. [86] studied the X-ray photoemission (XPS) and wavelength dispersive X-ray fluorescence (WDXRF) characteristics of In0.1 Ga0.9 N surfaces after acid, base, or sulfur-based chemical treatments followed by ALD of Al2 O3 thin films with TMA/H2 O or TMA/O2 plasma (plasma-enhanced ALD) at 250 °C.
The ALD of Al2 O3 with H2 O as a weak oxidizer does not seem to significantly modify the InGaN surface. Indium depletion occurs as the In4d intensity decreases, as observed previously in the case of the HCI or NH4 OH-treated surfaces only (upper portion of Fig. 15a, b). On the contrary, during the PEALD of A12 O3 (strong oxidizer), the NH4 OH-treated surfaces changed compared to HCl because the In4d component level is indistinguishable from the PEALD reference (as illustrated by Fig. 15a, bottom, and 15b). Then, if indium is assumed to be the main species sensitive to plasma-induced oxidation, the indium-depleted surfaces after HCI treatment would indeed remain in a stable state of oxidation regardless of the ALD or PEALD process. On the contrary, a higher proportion of indium from the NH4 OH-treated surfaces is more likely to be oxidized by the plasma species.
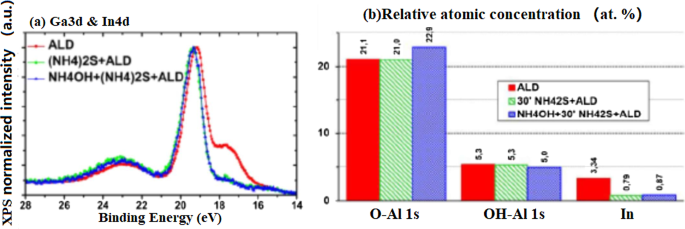
a Superposition of normalized Ga3d-In4d spectra for ALD and PEALD samples without, with a 30’ (NH4 )2 S or with a NH4 OH + 30’ (NH4 )2 S surface treatment, b proportion of O1s components and total indium contribution using In4d line [86]
If a 30' (NH4 )2 S surface treatment with or without prior treatment with NH4 OH is performed before ALD, the quantitative analysis seems to report (Fig. 15b) results similar to those observed previously without the alumina layer. As an example, a similar decrease in the indium proportion was observed (~ 75%). However, a slight increase in the O–Al-related component from the O1s line was observed for the sample that underwent the double surface treatment, probably owing to the increased surface hydrolysis by the first NH4 OH treatment. Thus, ALD does not seem to significantly modify the initial state of the (NH)S-treated surfaces. However, these results do not provide quantitative information regarding the proportion of sulfur after the deposition of Al2 O3 by ALD. Considering that sulfur was adsorbed on InGaN before deposition, further investigations are required to determine the evolution of sulfur bonds after ALD of Al2 O3 , especially if binding state differences with stronger oxidizing processes such as PEALD are evident.
ALD Technologies for the Transparent Electrode of VCSEL
For the transparent electrode of VCSEL, ALD can deposit the electrode with high transparency and good current spreading properties [90]. In terms of the current spreading of the conventional VCSEL, the metal electrode has good current spreading properties, but strongly absorbs the emitted light. Hence, the conventional VCSEL relies on the upper heavily-doped layer for current spreading. However, since the upper heavily-doped layer has poor current spreading performance and absorbs part of the emitted light, the light output power of the device is lowered. Therefore, a transparent conductive oxide (TCO) film deposited by ALD, exhibiting excellent photoelectric performance, can solve the current spreading problem described above.
Figure 16 shows the SEM images of ZnO films deposited on Si with ALD and CVD modes as the transparent conductive materials, which can be applied to new-generation photovoltaic devices. So far, there are few studies and reports on the application of TCO films in VCSEL devices. At present, the indium tin oxide (ITO) films are used in VCSEL devices. In 1997, C. L. Chua et al. [91] first reported the top-emitted VCSEL with a transparent tin oxide electrode. In this study, the peak transmittance of ITO is 96%. In 2002, Jiang et al. [92] studied the P-type ohmic contact of ITO as an 850 nm GaAs-based oxide restricted type VCSEL. In comparison with VCSELs with traditional Ti/Au contact, they found output power of the VCSEL with ITO contact is 1.27 times higher than the VCSEL with T/Au contact. In 2014, Meng et al. [93] found that the output power of the 850 nm GaAs oxide-confined VCSEL with an ITO transparent conductive film is 1.18 times higher than the traditional VCSEL.
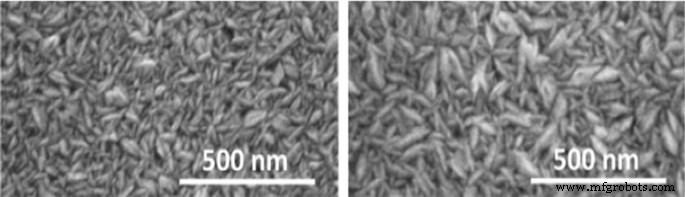
SEM images of ZnO films deposited on Si using ALD and CVD [90]
At present, the commonly used techniques for preparing TCO are magnetron sputtering, pulsed laser deposition, CVD, ALD, etc. However, it is difficult to achieve large-scale and large-area film formation using magnetron sputtering, the film deposited by pulsed laser deposition is uniform, and it is difficult to prepare large-area films while the deposition temperature for CVD is high, which renders it unsuitable for some devices that need to be prepared at low temperature. ALD possesses the advantage of highly controllable deposition parameters and the film deposited by it is characterized by good uniformity, absence of pinholes, and excellent shape preservation for film graphics. In this case, the oxide (TCO) film deposited by ALD can improve the properties of VCSELs.
Conclusions
This article reviews the application of ALD technology to the optoelectronic devices, µ-LEDs and VCSELs. Since sidewall damage is prominently observed in μ-LEDs when their sizes are reduced to the microscale level, this issue must be addressed to achieve high device performance. ALD sidewall passivation is a crucial technique because the sidewall damage can be reduced after passivating a surface with an ALD-grown dielectric. ALD passivation has also been found to help in protecting the quantum dot (QD) conversion layer in full-color displays. Different approaches involving the deposition of passivation layers have been established for reducing sidewall damage. In addition, an 85 °C/85% RH test with bias, which is a very difficult challenge for oxide-confined VCSEL devices, was conducted. In this study, we demonstrate that complex stacked dielectric layers as passivation films resist moisture ingress. The stacked passivation layers consist of Al2 O3 growth by ALD film and SiNx growth by PECVD film. A very good encapsulation that prevented damage from moisture and excellent reliability was observed. In addition, the effects of ALD on the accurate control of DBR growth are specified. This technique has also been found to enhance the optical properties of MQWs, such as the deposition of an anti-reflection layer for improving the light extraction efficiency of a VCSEL and the accurate control of the growth of MQWs for improving its crystalline quality. In addition, because the output power of the VCSEL with an ITO transparent conductive film exceeds that of the traditional VCSEL, this study addresses the potential applications of ALD for preparing the TCO films of VCSELs.
Verfügbarkeit von Daten und Materialien
The data used and analyzed during the current study are available from the corresponding authors upon reasonable request.
Abkürzungen
- PECVD:
-
Plasma-enhanced chemical vapor deposition
- ALD:
-
Atomic layer deposition
- LED:
-
Light emitting diode
- VCSEL:
-
Vertical cavity surface emitting laser
- CVD:
-
Chemical vapor deposition
- PVD:
-
Physical vapor deposition
- GPC:
-
Growth per cycle
- HKMG:
-
High-K metal gate
- FinFET:
-
Fin field-effect transistor
- WVTR:
-
Water vapor transmission rate
- OLED:
-
Organic light-emitting diode
- MEMS:
-
Micro-electro mechanical systems
- μLED:
-
Micro-LED
- WHTOL:
-
Wet high-temperature operation life
- OOK:
-
On–off keying
- PAM4:
-
Amplitude modulation 4-level
Nanomaterialien
- Mitsubishi Chemical Advanced Materials strebt Klimaneutralität bis 2023 und Klimapositivität bis 2030 an
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Synthese und Untersuchung von CuGeO3-Nanodrähten als Anodenmaterialien für fortschrittliche Natrium-Ionen-Batterien
- Ein fortschrittliches Kühlsystem für Computer und Batterien
- Verkleidung und Freiformabscheidung für Kühlmittelkanalabschluss
- SIGRABOND® Chemical CFK für Komponenten und Baugruppen



