Wiederherstellungsleistung von Ge-dotierten vertikalen GaN-Schottky-Dioden
Zusammenfassung
Vertikale GaN-Schottky-Dioden (SBDs) wurden auf Ge-dotierten freistehenden GaN-Substraten hergestellt. Die Kristallqualität der SBDs wurde durch Kathodenlumineszenzmessung charakterisiert und die Versetzungsdichte wurde zu ~ 1.3 × 10 6 . bestimmt cm − 2 . Bei den durchgeführten elektrischen Leistungsmessungen zeigen die SBDs eine niedrige Einschaltspannung von V an (0,70~0,78 V) und hoher Strom I an /Ich aus Verhältnis (9,9 × 10 7 ~1.3 × 10 10 ). Die Reverse Recovery-Eigenschaften wurden untersucht. Die Umkehrerholungszeit wurde mit 15,8, 16,2, 18,1, 21,22 und 24,5 ns für die 100-, 200-, 300-, 400- bzw. 500-μm-Durchmesser-SBDs erhalten. Unterdessen zeigen die Rückwärtserholungszeit und die Rückwärtserholungsladung beide eine signifikante positive Korrelation mit der Elektrodenfläche.
Einführung
In letzter Zeit hat ein Halbleiter mit großer Bandlücke – wie GaN – mit den inhärenten Vorteilen enorme Aufmerksamkeit in der Forschung für die Elektronikgeräte der nächsten Generation auf sich gezogen, insbesondere auf dem Gebiet der Hochfrequenz, hoher Leistung und hoher Leistung [1,2,3 ,4,5,6]. Dank der Entwicklung der Hydrid-Dampfphasen-Epitaxie (HVPE) ist die geringe Versetzungsdichte (≤ 10 6 cm − 2 ) GaN-Substrate sind jetzt kommerziell erhältlich [7,8,9,10]. Im Vergleich zu lateralen Bauelementen werden mit diesen Substraten hergestellte Bauelemente vom vertikalen Typ als eine fortschrittlichere Struktur angesehen, die dazu beiträgt, einen höheren Strom, weniger Kriechwege und eine bessere Zuverlässigkeit des Systems zu erreichen [11, 12]. Unter ihnen ist die GaN-basierte Schottky-Diode (SBD) eine wichtige Komponente in den Schaltgeräten. Im Gegensatz zu einer bipolaren Diode reduziert die SBD mit ihrer unipolaren Natur den Speichereffekt der Minoritätsträger stark und bietet dementsprechend eine hohe Schaltgeschwindigkeit mit geringen Sperrverzögerungsverlusten. Allerdings haben nur wenige Gruppen eine systematische Untersuchung der Reverse-Recovery-Eigenschaften für vertikale GaN-SBDs durchgeführt [13,14,15,16,17], wobei sich die Studien mehr auf den Vergleich der Schaltzeit in Bauelementen mit unterschiedlichen Strukturen konzentrierten. Daher besteht nach wie vor dringender Bedarf einer eingehenden Untersuchung des Mechanismus der Wiederherstellungsleistung für GaN-SBDs, insbesondere für die vertikalen.
Da die Ohmsche Kontakttechnik in vielen veröffentlichten Veröffentlichungen [18] kontinuierlich erforscht wurde, um die Leistungsfähigkeit von Bauelementen zu verbessern, ist stark dotiertes n-Typ-GaN ein Schlüsselglied für die Herstellung von Nitridbauelementen. Kürzlich wird Ge als Alternative zum Si-Dotierungsmittel in GaN vorgeschlagen, da beide eine ähnliche Eigenschaft der oberflächennahen Verunreinigung (die Aktivierungsenergie wird mit 20 bzw. 17 meV für Ge und Si angegeben) und die verursachte Gitterverzerrung teilen durch Ge-Atome, die in Ga-Zentren substituieren, wären aufgrund ihrer engeren Ionenradien kleiner [19, 20]. Es wird angenommen, dass die Ge-Dotierung eine glattere Oberfläche mit weniger Defekten bildet [21, 22]. Darüber hinaus ist diese Dotierung mit der geringeren Gitterverzerrung und Filmspannung auch in Hochtemperatur-Elektronikgeräten vielversprechend, die mehr Wert auf die thermische Stabilität legen. Obwohl das Ge-dotierte GaN theoretisch untersucht wurde, ist es wichtig, die tatsächlichen Auswirkungen auf das entsprechende Gerät zu untersuchen. In diesem Artikel werden die neuartigen vertikalen GaN-SBDs vorgeschlagen, die auf einem Ge-dotierten freistehenden (FS) GaN-Substrat hergestellt werden. Die vertikalen GaN-SBDs weisen eine überlegene Kristallqualität und elektronische Eigenschaften auf. Inzwischen wird die Rückgewinnungsleistung von vertikalen SBDs systematisch untersucht. Die Rückwärtserholungszeit und die Rückwärtserholungsladung zeigen schließlich eine signifikante positive Korrelation mit der Elektrodenfläche.
Methoden und Experimente
Das Schema der Gerätestrukturen für die hergestellten SBDs ist in Abb. 1a dargestellt, die hauptsächlich aus einem 390-μm-FS n + . besteht -GaN-Substrat und ein 9-μm-n − -GaN-Driftschicht. In dieser Arbeit wird die (0001)-orientierte GaN-Substratschicht mit einer Ge-Konzentration von 1 × 10 18 cm − 3 und eine Versetzungsdichte von 1 × 10 6 cm − 2 wurde durch HVPE gezüchtet. Und die undotierte Epitaxieschicht auf diesem Substrat wurde durch metallorganische chemische Gasphasenabscheidung mit einer Wachstumsrate von ~ 2 µm/h aufgewachsen. Für die SBD-Herstellung wurden ohmsche Kontakte aus Ti/Al/Ni/Au auf der Rückseite des GaN-Substrats gebildet. Auf der Vorderseite der Epitaxieschicht wurden Ni/Au-Schottky-Elektroden mit fünf verschiedenen Durchmessern (100, 200, 300, 400 und 500 μm) gebildet, wie in Fig. 1b gezeigt. Weitere Informationen zum Herstellungsprozess finden Sie in unserem vorherigen Bericht [23, 24].
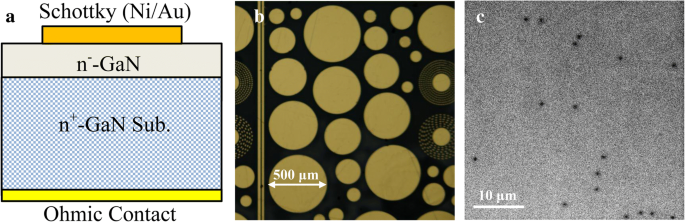
a Schematischer Querschnitt des hergestellten vertikalen SBD. b Optisches Mikroskopie-Bild der verschiedenen Elektroden. c Panchromatisches CL-Bild der Epitaxieschicht
Die Kathodolumineszenz(CL)-Bilder wurden unter Verwendung eines Quanta 400 FEG Rasterelektronenmikroskops (SEM) mit einer 10-kV-Beschleunigungsspannung erhalten, um die räumliche Verteilung der Versetzungsdichte für die Epitaxieschicht zu untersuchen. Kapazitätsspannung (C-V ) und Strom-Spannung (I-V ) wurden Messungen mit einem Keithley 4200 Halbleiterparameteranalysator durchgeführt, um die elektronischen Eigenschaften der SBDs zu bewerten. Und mit einem kundenspezifischen Versuchsaufbau wurden temperaturabhängige Messungen im Bereich von 300 bis 500 K durchgeführt.
Ergebnisse und Diskussion
Das CL-Ergebnis der Epitaxieschicht ist in Abb. 1c dargestellt. Da angenommen wird, dass die Versetzung ein nichtstrahlendes Rekombinationszentrum ist, erscheint sie auf dem CL-Bild in Form eines dunklen Flecks. Da kein merklicher Unterschied in der räumlichen Verteilung beobachtet wird, wurde der Durchschnittswert der Versetzungsdichte zu ~ 1,3 × 10 6 . berechnet cm − 2 , wobei die CL-Messungen in mehreren verschiedenen Regionen durchgeführt wurden. Dieses Ergebnis weist darauf hin, dass für vertikale SBDs eine hochwertige Epitaxieschicht erhalten wurde.
Da die vertikalen SBDs in einem parallelen Modus charakterisiert wurden, wurde der C-V und G-V Kurven wurden mit 1 MHz Frequenz erhalten. Die Ergebnisse der SBDs sind in Abb. 2a bzw. b gezeigt, wobei (1/C 2 ) gegen die angelegte Spannung V ist im Einschub eingezeichnet. Hier ist die Trägerkonzentration N d könnte mit folgendem Ausdruck ausgewertet werden:\( {N}_d=\frac{-2}{A^2 q\varepsilon \left[d\left(1/{C}^2\right)/ dV\right]} \), wobei A ist die Fläche von Schottky-Elektroden, q ist die Elektronenladung (1.602 × 10 − 19 C) und ε ist die Dielektrizitätskonstante von GaN (8.854 × 10 − 11 W/m). Daher ist das N d der Epitaxieschicht wurde zu ~ 6,2 × 10 15 . bestimmt cm − 3 . Und der Phasenwinkel θ könnte auch durch die folgende Gleichung berechnet werden:\( \theta ={\tan}^{-1}\left(\frac{2\pi fC}{G}\right) \), wobei f ist die angewandte Frequenz, C ist die Kapazität und G ist der gemessene Leitwert (Gate-Leakage). Da die Ergebnisse für verschiedene Durchmesser ähnlich sind, ist der berechnete Winkel θ gegen angelegte Spannung V der 300-μm-Durchmesser-SBDs ist im Einschub von Fig. 2b als Beispiel gezeigt. Beachten Sie, dass die θ sehr nahe bei 90° liegt, bestätigt dies, dass in dieser Studie ein ausgezeichnetes Schottky-Gate mit geringem Kriechweg erreicht wird. Die J-V Charakteristiken sind auch in Abb. 2c dargestellt. Es ist deutlich zu erkennen, dass das Ich an /Ich aus Verhältnisse sind 3,8 × 10 9 , 5.9 × 10 8 , 1,3 × 10 10 , 6,5 × 10 8 , und 9,9 × 10 7 für die 100-, 200-, 300-, 400- bzw. 500-μm-Durchmesser-SBDs, von denen die I an und ich aus sind definiert als der Strom bei der Gatespannung von 1,6 bzw. – 2 V. Nach der linearen Anpassung beträgt die Einschaltspannung V an der vertikalen SBDs wird mit 0,70, 0,76, 0,72, 0,70 bzw. 0,78 V bestimmt, wobei die Elektrodendurchmesser von 100 auf 500 &mgr;m ansteigen. Diese Ergebnisse zeigen, dass für die vertikalen SBDs gute elektronische Eigenschaften erhalten wurden.
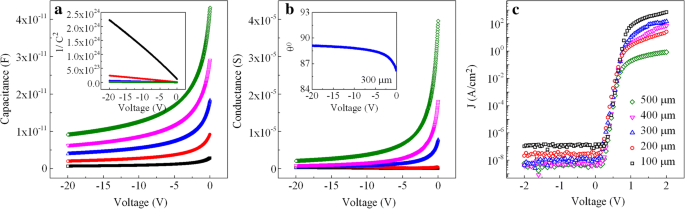
a Raumtemperatur C-V Kurve der vertikalen SBDs für jede unterschiedliche Elektrode bei einer Frequenz von 1 MHz. Der Einschub ist ein Diagramm von (1/C 2 ) gegen Spannung V . b G-V Kurve der vertikalen SBDs für jede unterschiedliche Elektrode. Der Einschub ist ein Diagramm des Phasenwinkels θ gegen Spannung V für SBDs mit 300 μm Durchmesser. c J-V Kurve der vertikalen SBDs für jede unterschiedliche Elektrode
Eine typische Testschaltung wurde verwendet, um die Sperrverzögerungseigenschaften der vertikalen SBDs zu messen, wie in Fig. 3a gezeigt. Die periodischen Rechteckwellenspannungssignale (von + 20 bis – 20 V) wurden sequentiell an einen Prüfling (DUT) angelegt, wo ein parasitärer Induktor die magnetische Energie speichern und den Strom beeinflussen würde. Wenn sich das Spannungssignal ändert, kann während der Periode ein Oszillationsstrom auftreten. Ein Hochgeschwindigkeits-Stromtastkopf mit einem Tektronix MDO 4104-3 Oszilloskop wurde zum Erfassen der transienten Stromvariation in den vertikalen SBDs angeordnet. Wie die schematische Wellenform des Sperrstroms in Abb. 3b gezeigt ist, ist in dieser Studie t a ist definiert als die Lagerzeit während t b ist als Rückstromverzögerungszeit definiert. Und die umgekehrte Erholungszeit T rr ist definiert als die Zeit, in der sich der Rückstrom auf 10 % des maximalen Rückstroms erholt I RM , das ist die Summe von t a und t b . Und die Reverse Recovery Charge Q rr erhält man durch Integration des Rückstroms bis T rr was der akkumulierten Ladung in einer Diode entspricht.

a Die Testschaltung, die verwendet wird, um die Sperrverzögerungseigenschaften von vertikalen SBDs zu messen. b Schematische Wellenform der Reverse Recovery-Eigenschaften von vertikalen SBDs
Abbildung 4 zeigt die Reverse Recovery-Kurve vertikaler SBDs für jeden Elektrodendurchmesser, wenn die angelegte Spannung von + 20 auf – 20 V umgeschaltet wurde. Hier für die 100-, 200-, 300-, 400- und 500-μm-SBDs , das T rr Werte wurden mit 15,8, 16,2, 18,1, 21,22 und 24,5 ns erhalten, während die Q rr die Werte wurden zu 0,0127, 0,0536, 0,150, 0,280 bzw. 0,405 nC integriert. Diese vertikalen Geräte zeigten alle eine schnelle Schaltzeit (weniger als 25 ns). In den Ergebnissen ist auch ein erheblich niedriger Sperrstrom zu beobachten, der auf die geringere gespeicherte Ladung in den SBDs zurückzuführen sein könnte [13]. Inzwischen ist auch deutlich zu erkennen, dass der Wert von T rr und Q rr beide nehmen mit der Vergrößerung des Elektrodendurchmessers zu und die kleinste zeigt die schnellste T rr von 15,8 ns.
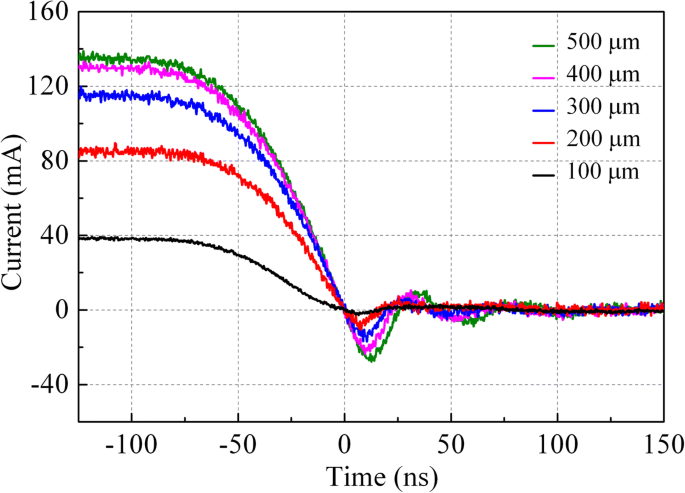
Rückstrom von vertikalen SBDs für jede unterschiedliche Elektrode
Um den diesen Veränderungen zugrunde liegenden Mechanismus weiter zu untersuchen, wurden die vertikalen SBDs auch gemessen, wenn die Spannung von + 10 auf – 10 V umschaltete. Als Rückwärtserholungszeit T rr gegen den Diodendurchmesser d ist in Abb. 5 aufgetragen, der Wert von T rr für jede Diode wurde nicht merklich verändert. Die Reverse-Recovery-Gebühr Q rr gegen die d wird gleichzeitig in Abb. 6 angezeigt, wobei die Daten von zwei Kurven auf denselben Trend hindeuten. Inzwischen ist es bemerkenswert, dass das Q rr beider Tests zeigen eine signifikant positive Korrelation mit dem d 2 , das heißt die Elektrodenfläche.
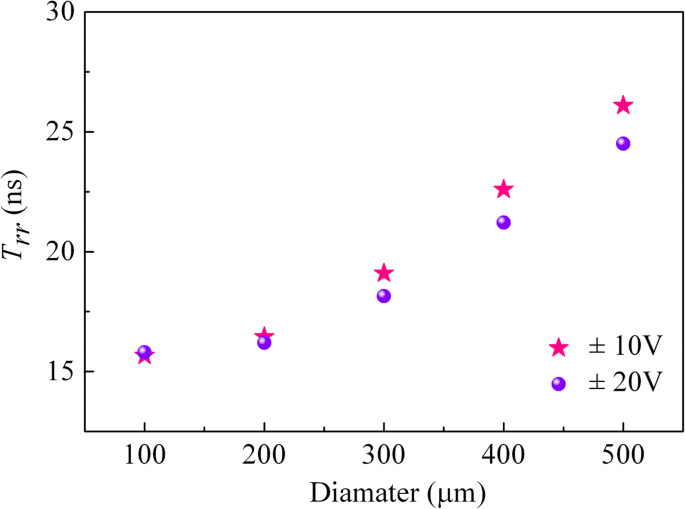
Rückwärtserholungszeit T rr versus Elektrodendurchmesser d
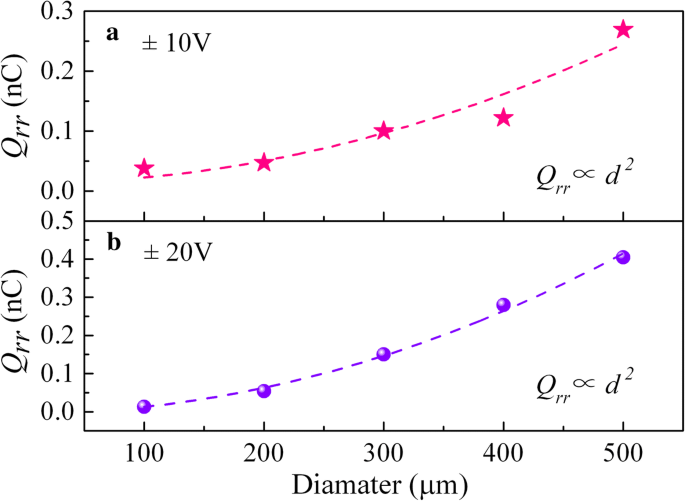
Reverse-Recovery-Gebühr Q rr versus Elektrodendurchmesser d
Tatsächlich wird berichtet, dass der Reverse-Recovery-Effekt hauptsächlich von der parasitären Induktivität und dem Einfangen von Grenzflächen von SBDs herrühren sollte [25, 26]. Wenn man bedenkt, dass der Beitrag der parasitären Induktivität in Form eines Schwingungsstroms charakterisiert ist, der in diesen Reverse-Recovery-Kurven nicht offensichtlich beobachtet wird, sollte die Änderung der Reverse-Recovery-Zeit und der Reverse-Recovery-Ladung daher aus den Fallen resultieren [27, 28]. Da die Konzentration der Fallen in vertikalen SBDs einheitlich ist, ist der Q rr würde von der Kontaktfläche des Geräts abhängen und schließlich mit der Elektrodenfläche zunehmen, wie in Fig. 6 gezeigt. Somit wirken die Fallen als Stopper für das elektrische Feld in der Grenzfläche. Während der t a wurde die Verzögerung stark durch das Einfangen von Ladungsträgern im Schottky-Übergang beeinflusst, während in der t b wird, wird die Rückwärtserholungsgeschwindigkeit auch um die Zeit zum Ausspülen der gespeicherten Ladung aus der Verbindung verlangsamt. Diese Ergebnisse stimmen mit unserem vorherigen Bericht [29] überein, der die RC . vorschlug Die Zeitkonstante nimmt mit zunehmendem Gerätedurchmesser zu und zeigt eine gute Abhängigkeit von der Rückerholungszeit. Eine weitere Verbesserung der Sperrverzögerungseigenschaften könnte von einer kleineren Elektrode oder einer dünneren Driftschicht in diesen Geräten erwartet werden.
Darüber hinaus wird die Erholungsleistung von vertikalen SBDs bei einer höheren Temperatur weiter untersucht. Abbildung 7 zeigt den Sperrstrom für GaN-SBDs mit einem Durchmesser von 500 μm, die bei 300, 400 bzw. 500 K gemessen wurden. Weder die Rückwärtserholungszeit noch die Rückwärtserholungsladung werden mit steigender Temperatur verändert. Diese Ergebnisse stimmen mit der obigen Analyse überein, da die Konzentration der Falle nicht sehr temperaturempfindlich ist. Umgekehrt wird berichtet, dass sich die Rückerholungszeit von Si-basierten SBDs um 191% erhöhen würde, wenn die Temperatur von 300 auf 425 K ansteigt [17]. Hier wird gezeigt, dass GaN-SBDs mit einer kurzen Trägerlebensdauer und einer größeren Bandlücke erhebliche Verbesserungen bei der Strombelastbarkeit, der Rückwärtserholung und dem Energieverlust bieten. Da die thermische Stabilität von GaN-basierten SBDs der von herkömmlichen Halbleitern mit schmaler Bandlücke überlegen ist [30], kann geschlossen werden, dass GaN auch ein geeignetes Material für Schaltgeräte ist, die in einer Hochtemperaturumgebung eingesetzt werden.
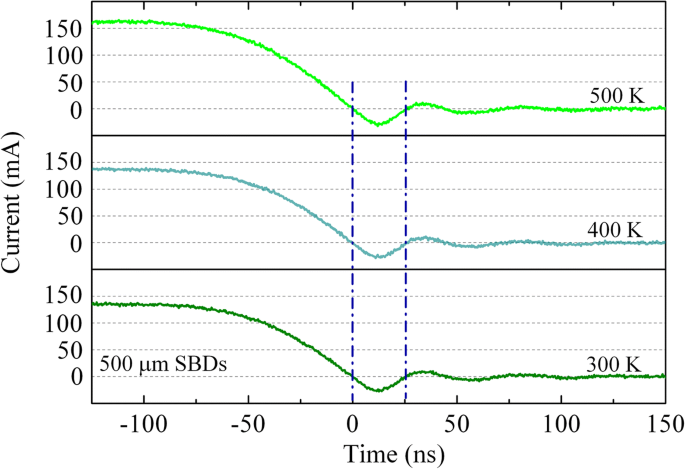
Reverse Recovery-Eigenschaften für SBDs mit 500 μm Durchmesser, gemessen bei 300, 400 bzw. 500 K
Schlussfolgerungen
Zusammenfassend haben wir vertikale GaN-SBDs auf Ge-dotierten FS-GaN-Substraten hergestellt, die durch HVPE gewachsen sind. Die Materialcharakterisierung und die durchgeführten Strom-Spannungs-Messungen zeigen, dass für die vertikalen SBDs eine ausgezeichnete Kristallqualität und elektronische Eigenschaft erhalten wurde. Die Reverse Recovery-Eigenschaften wurden systematisch untersucht. Die Sperrverzögerungszeit wurde mit 15,8, 16,2, 18,1, 21,22 und 24,5 ns für die Dioden mit 100-, 200-, 300-, 400- bzw. 500 µm-Durchmesser erhalten. Unterdessen zeigen die Rückwärtserholungszeit und die Rückwärtserholungsladung beide eine signifikante positive Korrelation mit der Elektrodenfläche. Unsere Ergebnisse können als Referenz für die weitere Verbesserung der Rückgewinnungsleistung von GaN-basierten SBDs dienen.
Abkürzungen
- CL:
-
Kathodolumineszenz
- C-V :
-
Kapazität-Spannung
- DUT:
-
Gerät im Test
- FS:
-
Freistehend
- GaN:
-
Galliumnitrid
- HVPE:
-
Hydrid-Dampfphasen-Epitaxie
- I-V :
-
Strom-Spannung
- SBDs:
-
Schottky-Dioden
- SEM:
-
Rasterelektronenmikroskop
Nanomaterialien
- Dioden
- Quantengeräte
- Spezielle Dioden
- Navistar:Robuste Leistung
- HDPE-Technologie mit hoher Feuchtigkeitsbarriere für flexible Mehrschichtverpackungen
- Auswirkung von UV-Bestrahlung auf die Eigenschaften von 4H-SiC-PiN-Dioden
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Zielgerichtete Endothelzellen mit multifunktionalen GaN/Fe-Nanopartikeln
- Durch sichtbares Licht angetriebene photokatalytische Leistung von N-dotierten ZnO/g-C3N4-Nanokompositen
- 3 Möglichkeiten zur Verbesserung der Leistung Ihrer vertikalen Pumpe



