Ein Mehrebenen-Memristor basierend auf einem Al-dotierten HfO2-Dünnfilm
Zusammenfassung
Nichtflüchtiger Speicher (NVM) wird in den digitalen Technologien der nächsten Generation, einschließlich des Internets der Dinge, eine sehr wichtige Rolle spielen. Die Metalloxid-Memristoren, insbesondere auf Basis von HfO2 , wurden von vielen Forschern aufgrund ihrer einfachen Struktur, ihrer hohen Integration, ihrer schnellen Betriebsgeschwindigkeit, ihres geringen Stromverbrauchs und ihrer hohen Kompatibilität mit fortschrittlichen (komplementären Metalloxid-Silizium-) CMOS-Technologien bevorzugt. In diesem Papier wird ein stabiler Widerstand mit 20 Stufen Al-dotiertes HfO2 . angegeben -basierter Memristor wird vorgestellt. Die Zyklenbeständigkeit, Datenspeicherzeit und das Widerstandsverhältnis sind größer als 10 3 ,> 10 4 s bzw.> 10.
Hintergrund
Obwohl das Phänomen des negativen Widerstands zuerst von Hickmott in einem Al/Al2 . entdeckt wurde O3 /Au-Struktur im Jahr 1962 [1], und Chua schlug 1971 das Konzept des Memristors vor [2]. Erst Strukov et al. stellten das TiO2 . her -basierten Memristoren im Jahr 2008 [3], dass die Leute begannen, der Studie über Memristoren Aufmerksamkeit zu schenken. Derzeit haben Forscher Memristoren mit mehr als Dutzenden von aktiven Widerstandsmaterialien hergestellt, darunter mehrere komplexe Oxide [4, 5], Metalloxide wie ZnO [6], TiOx [7], TaOx [8] und zweidimensionale Materialien [9, 10]. HfO2 wird aufgrund seiner hohen Zuverlässigkeit, schnellen Betriebsgeschwindigkeit und seines geringen Stromverbrauchs als High-k-Gate-Dielektrika in CMOS-Bauelementen verwendet [11, 12]. Es wird auch von Forschern als memristives Material bevorzugt [13,14,15].
Mehrstufige Memristoren können häufig als Datenspeicher [16,17,18], logische Berechnungen [19], elektronische synaptische Vorrichtungen [20,21,22,23] usw. verwendet werden. Wang Y. [16] und Gao B. et al. [24] stellten mehrstufige Memristoren durch Dotieren von HfO2 . her mit Cu bzw. Gd, sie können jedoch nur einen 4-Level-Speicherzustand erzeugen, der den Anforderungen der Anwendungen nur schwer gerecht wird. Daher ist die Studie zu HfO2 mehrstufigen Memristoren von großer Bedeutung.
Methoden
Ti/Al:HfO2 Die /Pt-Vorrichtung wurde wie in Fig. 1a gezeigt hergestellt. Die aktive Zellfläche wurde durch die quadratische Ti-Top-Elektrode (TE) definiert. Eine 20-nm-Ti-Haftschicht wurde durch Gleichstrom-(DC)-Sputtern auf einem Siliziumsubstrat abgeschieden, dann wurde ein 100-nm-Pt-Film als untere Elektrode (BE) abgeschieden. Das 20-nm-Al-dotierte HfO2 Funktionsschicht wurde im Atomic Layer Deposition (ALD) Reaktor (R-150, Picosun, Espoo, Finnland) bei 300 °C mit MeCp2 . abgeschieden HfMe(OMe) (bezeichnet als HfD-04) als Hf-Vorstufe und H2 O als Sauerstoffquelle [25]. Die Vorläufer wurden von hochreinem N2 . getragen (> 99,999 %) in die Reaktorkammer. Al-dotierte Filme wurden durch Abscheiden eines Zyklus von Al2 . erhalten O3 alle 8 Zyklen von HfO2 mit Trimethylaluminium (TMA) als Al-Quelle und H2 O als Sauerstoffquelle. Die Al-Atomkonzentration von 6,2 % wird durch Röntgen-Photoelektronenspektroskopie (XPS, Axis Ultra DLD, Kratos Analytical, Manchester, UK) auf einem Theta 300 XPS-System von Thermo Fisher nachgewiesen. Ein 50 nm Ti-Film als TE und 100 nm Pt als Deckschicht wurden durch DC-Sputtern abgeschieden. Bauelemente werden durch Strukturieren des TE durch optische Lithographie und einen Lift-Off-Prozess erhalten. Abbildung 1b ist die optische Mikroaufnahme der Geräte. Wir haben Geräte mit unterschiedlichen Flächen von 5 µm × 5 µm bis 500 µm × 500 µm vorbereitet.
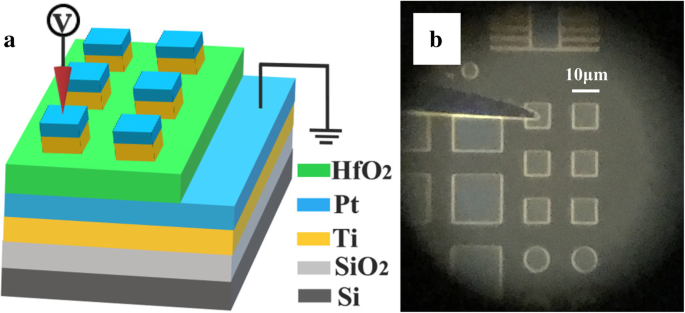
Der Aufbau der Geräte. a 3D-Modell der Memristoren. b Optische Mikroskopie der Geräte
Ergebnisse und Diskussion
Abbildung 2 zeigt die XPS von Al-dotierten und nicht-dotierten Bauelementen. Im Vergleich zu den Spektrogrammen von nicht dotierten Bauelementen zeigen Al-dotierte Bauelemente einen deutlichen 74,1 eV Peak von Al 2p in Fig. 2a, und die Bindungsenergie von Hf 4f weist in Fig. 2b einen gewissen Anstieg auf. Das Verhältnis von Hf 4f5/2 bis Hf 4f7/2 auch für die dotierten Geräte erhöht. Es stimmt mit den anderen Berichten überein [14, 26, 27]. Al-Atome binden sich an die HfO2-Struktur, um Hf-Al-O zu bilden, was zu schwächeren und leichter gebrochenen Hf-O-Bindungen führt.

Das XPS von Al-dotierten und nicht-dotierten Geräten. a Al 2p und b Hf 4f werden verglichen
Für alle elektrischen Messungen wurde das Ti TE vorgespannt, während das Pt BE geerdet war. DC-Sweeps wurden unter Verwendung eines B1500A-Parameteranalysators (Santa Clara, CA, USA) mit einer Quellen-/Messeinheit durchgeführt, und es werden auch elektrische Pulsmessungen mit einem Wellenformgenerator/einer schnellen Messeinheit verwendet. Alle Geräte weisen vor einem notwendigen elektrischen Umformprozess einen hochohmigen Zustand (HRS) auf. Abbildung 3a zeigt die Formgebungscharakteristik der 10 μm × 10 μm Al-dotierten und nicht dotierten Bauelemente. Eine Stromnachgiebigkeit während der Umformung ist notwendig, um die Geräte vor Beschädigung zu schützen. Der Anfangswiderstand und die Formierspannung eines nicht dotierten Bauelements sind größer. Die Schwingung im Niederspannungsbereich des undotierten Bauelements liegt daran, dass der Strom niedriger ist als die Messgrenze des Instruments. Der Rücksetzprozess nach dem Bildungsschritt wird durch Anlegen einer negativen Spannung motiviert, wie in 3a gezeigt, und dann wird der erste Setzprozess motiviert. Wenn die Spannungsamplitude des Rücksetzens ansteigt, steigt der Strom beider zwei Vorrichtungen auf ein Maximum an, das größer als der begrenzte Strom der Bildung ist, und nimmt dann ab. Die HRS-Ströme beider Geräte sind um mehrere Größenordnungen größer als die des Ausgangszustands bei gleicher Spannung. Es deutet darauf hin, dass noch ein leitfähiges Filament vorhanden ist, das nach dem Zurücksetzen nicht vollständig verschmolzen werden kann. Die typischen Set/Reset-I-V-Kurven in Abb. 3b zeigen beide Typologien dieser beiden Geräte im bipolaren Betriebsmodus [28]. Das Schaltverhältnis und die Setz-/Rücksetzspannung von Al-dotierten Bauelementen sind kleiner als die von nicht dotierten Bauelementen, aber sein Widerstandszustands-Transformationsprozess ist sanfter und eignet sich als Mehrwertspeicherbauelement.
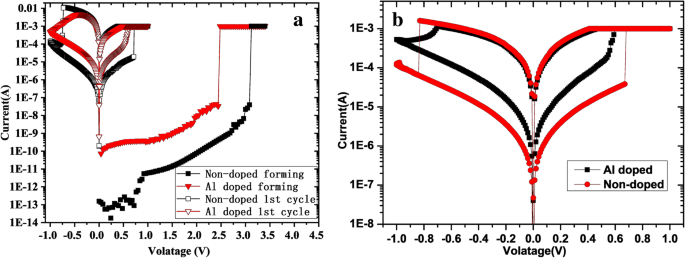
Die I/V-Eigenschaften der Geräte. a Der Umformprozess und der erste Zyklus. b Der typische Set/Reset-Vorgang
Zur Verdeutlichung der Schaltmechanismen der Geräte sind in Abb. 4 die I-V-Kurven doppelt logarithmisch aufgetragen. Bei beiden Gerätearten zeigt die niederohmige Kurve ein lineares ohmsches Verhalten, was auf die Bildung von leitenden Filamenten in hinweist HfO2 Filme während ihrer Einstellung [29, 30]. Die Hochwiderstandskurven sind jedoch zwischen diesen beiden Arten von Geräten ziemlich unterschiedlich. Für das dotierte Bauelement besteht es aus drei Bereichen:dem Ohmschen Bereich (I∝V), dem Child-Gesetz-Bereich (I∝V 2 ) und dem steilen Stromanstiegsbereich, der mit der typischen I-V-Charakteristik des trap-kontrollierten raumladungsbegrenzten Stroms (SCLC) übereinstimmt [31, 32]. Die hochohmige Kurve des undotierten Bauelements besteht aus zwei Bereichen:der Ohmschen Leitung (I∝V) im Niederspannungsbereich und der linearen Anpassung von lnI-V 1/2 im Hochspannungsbereich (Einschub von Abb. 4), was den Schottky-Emissionsmechanismus bestätigt [15, 33].
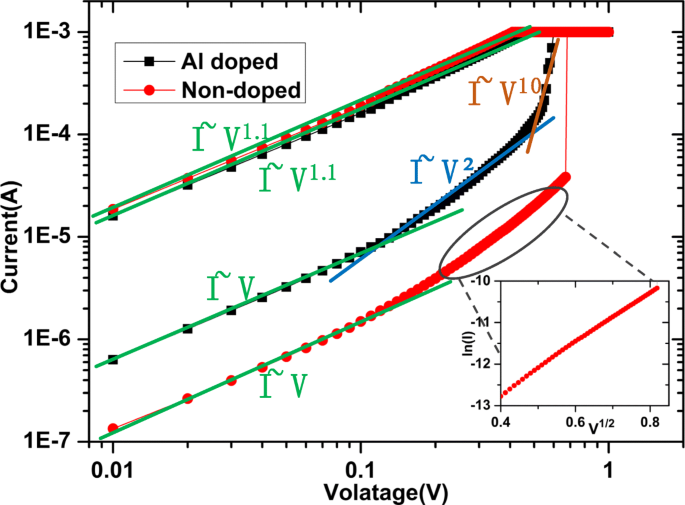
Die Kurvenanpassung des SET-Prozesses in den doppelt logarithmischen Koordinaten
Gemäß den obigen Merkmalen werden die mikroskopischen Mechanismen der Memristoren wie folgt zusammengefasst. Bei undotierten Geräten werden mit zunehmender positiver Spannung, die an die Titanelektrode angelegt wird, immer mehr Sauerstoffionen im HfO2 . erzeugt und bewegen sich in Richtung der Titanelektrode [34], wodurch Titanoxid entsteht [35]. Gleichzeitig sammeln sich die Sauerstoffleerstellen an der Grenzfläche zwischen der Platinelektrode und dem HfO2 . an , die allmählich leitfähige Filamente bilden [36]. Daher steigt der Strom allmählich mit der Spannung an. Die Geräte gehen in den niederohmigen Zustand (LRS) über, wenn die sauerstoffleeren leitenden Filamente das TE und das BE verbinden. Während die Titanelektrode mit einer negativen Spannung beaufschlagt wird, verbinden sich die Sauerstoffionen mit den Sauerstoffleerstellen am HfO2 /Pt-Grenzfläche [37], was zu einer niedrigeren Sauerstoffleerstellenkonzentration und einer höheren Schottky-Barriere führt. Wenn die Rücksetzspannung erreicht ist, wird das leitfähige Filament unterbrochen und das Gerät wird auf HRS umgestellt.
Bei Al-dotierten Geräten binden Al-Atome an die HfO2-Struktur, um Hf-Al-O zu bilden, was zu schwächeren und leichter gebrochenen Hf-O-Bindungen führt. Die Bildungsenergie der Sauerstoffleerstelle wird reduziert. Daher haben die Dotiervorrichtungen einen kleineren Widerstand und eine niedrigere Übergangsspannung. In undotierten Filmen neigen Sauerstoffleerstellen dazu, sich entlang der Korngrenzen anzusammeln [38, 39]. Als Ergebnis sind leitende Filamente wenige und dick. Der Widerstand der Geräte variiert stark mit der Leitung und dem Bruch der leitfähigen Filamente. In den dotierten Filmen werden in der Nähe der Fremdatome leicht Sauerstoffleerstellen gebildet [35, 40, 41]. Die gleichmäßige Verteilung einer großen Menge an Verunreinigungen in dem Dünnfilm macht die Bildung der leitfähigen Filamente durch Sauerstoffleerstellen besser kontrollierbar. Daher ist es einfacher, mehrere Widerstandswerte zu erreichen.
Die Geräte können auf verschiedene stationäre Widerstandszustände eingestellt werden, indem die aktuelle Konformität des eingestellten Prozesses geändert wird. Zwanzig stabile Widerstandszustände werden durch Einstellen der Stromnachgiebigkeit von 0,5 mA bis 10 mA mit einem Schritt von 0,5 mA in Fig. 5a erhalten. Da die Widerstandszustände durch DC-Sweep eingestellt werden, ist der Energieverbrauch groß und der Betrieb kompliziert. Andererseits werden die Widerstandswerte in LRS leicht verriegelt, wenn eine große Stromnachgiebigkeit verwendet wird. Auch diese Methode ist nicht in der Lage, die HRS einzustellen. Zwanzigstufige Widerstandszustände, die durch Ändern der Spannungsamplitude des Setz- und Rücksetzimpulses erreicht werden. Um die Möglichkeit eines Stromüberschwingens und eines Set/Reset-Fehlers zu vermeiden, wird die Spannungsamplitude zwischen 1 V~1,9 V für SET und − 1 V~− 1,9 V für Reset begrenzt. Aus dem Kastendiagramm (Abb. 5b) ist zu erkennen, dass der zulässige Spannungsbereich in 20 Werte unterteilt ist und die Ausbeute des Gerätes weit über dem 3 σ-Niveau liegt (99,73 %). Dies ist eine gängige Anforderung in der Produktion. Der Nachteil dieser Methode ist, dass die Geräte nicht direkt von einem HRS (LRS) auf einen anderen HRS (LRS) eingestellt werden können, sondern zuerst auf LRS (HRS) zurückgesetzt (gesetzt) und dann auf die Ziel-HRS (LRS) eingestellt werden müssen. . Dies erhöht die Komplexität und den Stromverbrauch des Vorgangs.

Der Mehrwertspeicher der Geräte. a Transformieren Sie Widerstandszustände, indem Sie Compliance-Ströme einstellen. b 20 stabile Widerstandszustände durch Einstellen der Pulsspannungsamplitude Die Pulsbreite und das Intervall betragen beide 500 μs
Ein besserer Ansatz ist in Fig. 6 gezeigt. Die Leitfähigkeit der Vorrichtung wird durch aufeinanderfolgende Impulse inkrementell erhöht oder verringert. Die Impulsdauer und das Intervall betragen beide 10 µs. Der Leitwert wird durch einen 0,1 V Leseimpuls nach jedem Set/Reset-Impuls gemessen. Wie in Fig. 6 zu sehen ist, hängt die Anzahl der Impulse, die zum Setzen/Rücksetzen der Geräte auf unterschiedliche Pegel erforderlich sind, von der angelegten Spannung ab. Die unterschiedlichen Widerstandsstatuen mit 20 Stufen werden durch Setzen und Zurücksetzen erhalten, indem 0,5 V als SET-Spannung bzw. − 0,7 V als Reset-Spannung gewählt werden (Abb. 7). Das Gerät wird jedes Mal mit 10 – 0,9 V aufeinanderfolgenden Impulsen auf HRS zurückgesetzt, bevor es auf den Zielstatus gesetzt wird, oder auf LRS durch 10 aufeinanderfolgende 0,8-V-Impulse vor der Einstellung zurückgesetzt. Unter Berücksichtigung des gleichen Status, der sowohl beim Setz- als auch beim Reset-Prozess vorliegt, werden insgesamt 35 verschiedene Status erhalten. Die Abweichung der Impulszahl, die für die beiden benachbarten Widerstandszustände von Set (Reset) benötigt wird, überschreitet den 3 -Pegel. Der Nachteil besteht darin, dass, wenn sich die Widerstandswerte der Geräte stark ändern, die benötigte Impulszahl groß und die Betriebsgeschwindigkeit langsam ist.
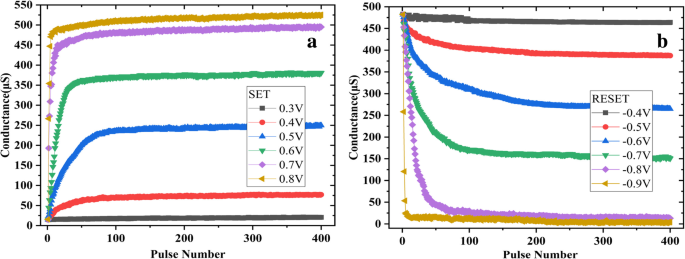
Der Widerstand wird durch aufeinanderfolgende Impulse eingestellt. a Prozess festlegen und b Reset-Prozess

Zum Einstellen benötigte Pulszahl (a ) oder zurücksetzen (b ) die Geräte auf 20 verschiedene Ebenen
Um die Datenhaltung der Geräte zu testen, werden 20 Geräte auf eine Reihe unterschiedlicher Widerstandswerte gesetzt/zurückgesetzt und auf einem Heiztisch bei 85 °C gehalten [42]. Die Widerstandswerte wurden mit einer Spannung von 0,1 V alle 100 s gemessen. Aus Fig. 8a ist ersichtlich, dass der Widerstand der Geräte nach 10 4 . stabil bleibt S. Um die Zyklensicherheit des Gerätes zu testen, haben wir den Setz- und Resetvorgang mit einem 1,8 V/500 µs Setzimpuls und einem − 1,8 V/500 µs Resetimpuls wiederholt. Nach 10 3 Zyklen ist das Schaltverhältnis des Geräts in Abb. 8b immer noch größer als 10.
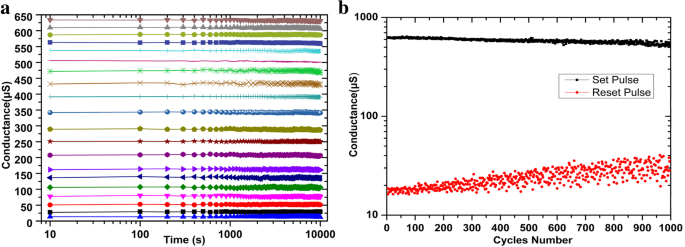
Die Zuverlässigkeitstests der Geräte. a Datenerhaltungseigenschaften nach Set-/Reset-Impulsvorgängen. b Zyklen der Ausdauerkurven für Set/Reset-Pulsoperationen
Schlussfolgerungen
Das vorgeschlagene Al-dotierte HfO2 Memristor zeigt ein allmähliches und stabiles Set/Reset-Verhalten. Durch Anpassen der Setzungskurve von Al-dotierten und undotierten Bauelementen wird festgestellt, dass bei HRS das undotierte Bauelement dem Schottky-Emissionsmechanismus folgt, während das Al-dotierte Bauelement dem SCLC-Leitfähigkeitsmechanismus folgt. Der mikroskopische physikalische Mechanismus der Widerstandsänderung wird ebenfalls diskutiert. Darüber hinaus wurde die mehrwertige Speicherung des Gerätes durch Änderung des Compliance-Stroms, Anpassung der Set/Reset-Pulsspannungsamplitude und Verwendung der aufeinanderfolgenden kurzen Pulse bestätigt. Schließlich haben wir die Zuverlässigkeit der Geräte getestet, um zu beweisen, dass sie eine Datenspeicherung von mehr als 10 4 . haben s (85 °C) und ein Schaltverhältnis größer als 10 nach 10 3 Zyklen.
Verfügbarkeit von Daten und Materialien
Alle während dieser Studie generierten oder analysierten Daten sind in diesem veröffentlichten Artikel enthalten.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- BE:
-
Untere Elektrode
- CMOS:
-
Komplementäres Metalloxid Silizium
- HfD-04:
-
MeCp2 HfMe(OMe)Hf
- HRS:
-
Hochohmiger Zustand
- LRS:
-
Niederohmiger Zustand
- NVM:
-
Nichtflüchtiger Speicher
- SCLC:
-
Raumladungsbegrenzter Strom
- TE:
-
Top-Elektrode
- TMA:
-
Trimethylaluminium
- XPS:
-
Röntgenphotoelektronenspektroskopie
Nanomaterialien
- X.509-basierte Geräteauthentifizierung in Eclipse Hono
- Nanographem, flexibler transparenter Speicher auf Siliziumbasis
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Herstellung von nanoskaligen Gruben mit hohem Durchsatz auf Polymerdünnschicht unter Verwendung der AFM-Spitzen-basierten dynamischen Pfluglithographie
- Vorbereitung und thermoelektrische Eigenschaften von ITO/PtRh:PtRh-Dünnschicht-Thermoelementen
- Ultraempfindlicher Dehnungssensor auf Basis eines flexiblen piezoelektrischen Poly(vinylidenfluorid)-Films
- Verbesserte energetische Leistung basierend auf der Integration mit Al/PTFE-Nanolaminaten
- Design eines bionischen cochleären Basilarmembran-Akustiksensors für Frequenzselektivität basierend auf einem triboelektrischen Film-Nanogenerator
- Ambarella, Lumentum und ON Semiconductor arbeiten gemeinsam an KI-basierter 3D-Erkennung für AIoT-Geräte der nächsten Generation
- Niob-Titan-Nitrid-Dünnschichtbeschichtung



