Zusammensetzungsabhängigkeit der strukturellen und elektronischen Eigenschaften von quartärem InGaNBi
Zusammenfassung
Um eine praktikable Bandstrukturtechnik und damit eine verbesserte Lumineszenzeffizienz zu realisieren, ist InGaNBi eine attraktive Legierung, die in photonischen Geräten für sichtbares Licht und mittleres Infrarot genutzt werden kann. In der vorliegenden Studie werden die strukturellen, elektronischen Eigenschaften wie Bandlücke, Spin-Bahn-Aufspaltungsenergie und Substratspannung von InGaNBi im Vergleich zu In- und Bi-Zusammensetzungen mithilfe von First-Principles-Rechnungen untersucht. Die Gitterparameter steigen mit zunehmender In- und Bi-Zusammensetzung fast linear an. Durch Wismutdotierung könnte die quartäre InGaNBi-Bandlücke einen weiten Energiebereich von 3,273 bis 0,651 eV für Bi bis zu 9,375% und In bis zu 50% abdecken, was dem Wellenlängenbereich von 0,38-1,9 µm entspricht. Die berechnete Spin-Bahn-Aufspaltungsenergie beträgt etwa 0,220 eV für 3,125%, 0,360 eV für 6,25% bzw. 0,600 eV für 9,375% Bi. Wir haben auch die Belastung von InGaNBi auf GaN gezeigt; es zeigt an, dass InGaNBi durch Anpassen der In- und Bi-Zusammensetzungen auf GaN mit einer akzeptablen Dehnung entwickelt werden kann.
Einführung
Wurtzit (WZ) in den letzten Jahren In x Ga 1−x N-Legierungen und InGaN/GaN-Quantentöpfe (QWs) haben aufgrund ihres großen Potenzials für die Entwicklung von Solarzellen, hocheffizienten Leuchtdioden (LEDs) und Laserdioden (LDs) große Aufmerksamkeit erregt [1–10]. Das häufig verwendete [0001]-orientierte In x Ga 1−x N/GaN-QWs erleiden ein starkes eingebautes elektrisches Feld, das durch die biaxiale Druckspannung des In . induziert wird x Ga 1−x N-Schicht [11], die zur Abnahme der QW-Emissionsenergie und der Oszillatorstärke von Elektron-Loch-Paaren führt. Außerdem gibt es eine hohe Dichte an geometrischen Defekten in In x Ga 1−x N-Legierungen, einschließlich Stapelfehler und Gewindeversetzungen (TDs) [12]; diese TDs haben eine große Korrelation mit nichtstrahlenden Rekombinationszentren. Defekte, Elektronenverlust und Auger-Rekombination sind die drei Ursachen für den Effizienzabfall von In x Ga 1−x N LEDs, von denen die Auger-Rekombination die Hauptursache ist [13].
In ähnlicher Weise wurde für Infrarotdioden auf GaAs-Basis bereits vorgeschlagen, dass das Legieren von Wismut ein wirksames Verfahren zur Verringerung der Bandlücke (E g ) sowie die Spin-Bahn-(SO)-Aufspaltung verbessern, um die Unterdrückung des Auger-Rekombinationsprozesses zu erreichen [14]. Das größte Element der Gruppe V von Wismut zeigt attraktive Auswirkungen auf die physikalischen Eigenschaften von Wismidlegierungen. Die Veränderungen der Bandstruktur von Bismidlegierungen wurden experimentell und theoretisch für verschiedene ternäre Legierungsmaterialien untersucht, wie AlNBi [15], GaNBi [16, 17], GaSbBi [18, 19], InPBi [20, 21], und InSbBi [19, 22–24]. Die Bandlücke wird hauptsächlich durch die große Bi-Atom-induzierte Spannung bei hoher Konzentration in InPBi modifiziert. Der Einbau von Bi stört die Valenzbänder (VBs) aufgrund der Wechselwirkung von Bi-Störstellenzuständen mit schweren/leichten Lochbändern und Spin-Bahn-Abspaltungsbändern [21]. In jüngerer Zeit haben auch quartäre Bismidlegierungen (z. B. GaAsNBi [25–27], InGaAsBi [28, 29], GaAsPBi [30]) große Aufmerksamkeit erregt. Die lokalen Verzerrungen um P- und Bi-Atome tragen wesentlich zur Modifikation der Bandlücke von GaAsPBi bei. Eine Zusammensetzungsanforderung für Ga As 1−x −y P y Bi x um ein niedrigeres Auger-Rekombinationsverhältnis als GaAs zu erreichen [30]. Die Kombination von Wismut und anderen III- oder V-Atomen erweitert den Umfang der Bandstruktur-Engineering, einschließlich der Kontrolle der Bandlücke, der Spin-Bahn-Aufspaltung, der Leitungs- (CB) und Valenzband-Offsets und der Dehnung [25]. Daher ist es von großem Interesse, die Wirkung der Bi-Substitution auf das [0001] In . zu beschreiben x Ga 1−x N/GaN, zur Abstimmung der strukturellen und elektronischen Eigenschaften und damit der Lumineszenzeffizienz. In der vorliegenden Studie wurden mit First-Principles-Rechnungen [31] die strukturellen, elektronischen Eigenschaften wie Bandlücke, Spin-Bahn-Aufspaltungsenergie (Δ SO ) und die Substratspannung von InGaNBi gegenüber In- und Bi-Zusammensetzungen werden untersucht. In Anbetracht der großen Gitterfehlanpassung und der schlechten Qualität für In-Gehalte von mehr als 55–60 % in der InGaN-Probe [32] sowie der geringen Löslichkeit von Wismut in verdünnten Bismidlegierungen werden die Konzentrationen von In und Bi auf bis zu 50 % kontrolliert und 9,375 % bzw. Das Papier ist wie folgt aufgebaut. Im Abschnitt „Methoden“ stellen wir die detaillierten Berechnungsmethoden vor. Die strukturellen, elektronischen Eigenschaften und die Substratspannung werden im Abschnitt „Ergebnisse und Diskussion“ bereitgestellt. Abschließend wird noch eine kurze Zusammenfassung zusammengefasst.
Methoden
Unsere theoretischen Berechnungen basieren auf der Dichtefunktionaltheorie (DFT) [31], wie sie im VASP-Code implementiert ist [33, 34]. Bei der Berechnung der Struktureigenschaften werden die Elektron-Ion- und Austausch-Korrelations-Wechselwirkungen mit der Projektor-Augmented-Wave-Methode (PAW) [35, 36] und der Generalized Gradient Approximation (GGA) des Perdew-Burke-Ernzerhof (PBE) behandelt. [37] bzw. Die Valenz-Elektronen-Konfigurationen für In-, Ga-, N- und Bi-Atome werden als 4d . verwendet 10 5s 2 5p 1 , 3d 10 4s 2 4p 1 , 2s 2 2p 3 , und 5d 10 6s 2 6p 3 , bzw. Um die Unterschätzung des PBE-Potentials auf der Bandlücke der elektronischen Eigenschaften zu überwinden, verwenden wir das modifizierte Becke-Johnson-Austauschpotential in Kombination mit der lokalen Dichteapproximationskorrelation (MBJLDA) [38]. Wismut hat einen großen Spin-Bahn-Kopplungseffekt (SOC), und daher wird SOC in die elektronischen Berechnungen einbezogen. Bei allen Berechnungen werden die Strukturen entspannt, bis die Kräfte auf jedes Atom weniger als 0,02 eV/Å betragen und die maximale Energieänderung in der Größenordnung von 10 −4 . liegt eV. Um die Genauigkeit der Berechnungen zu gewährleisten, wird ein Cutoff für ebene Wellen von 450 eV eingestellt. Ein Monkhorst-Pack mit 4×4×4k -Punktnetz wird in der ersten Brillouin-Zone übernommen.
Ergebnisse und Diskussion
Strukturelle Eigenschaften
Die Superzellen bestehen aus 4×2×2 primitiven WZ-GaN-Zellen, einschließlich 64 Atomen. Wir untersuchen 36 Kompositionen von I n y Ga 1−y N 1−x Bi x mit 0≤x ≤0.09375,0≤y ≤0.5 basierend auf neueren Experimenten, bei denen die InGaN-Probe eine große Gitterfehlanpassung und eine schlechte Qualität für einen In-Gehalt von mehr als 55–60% [32] sowie die geringe Löslichkeit von Wismut in verdünnten Bismidlegierungen aufweist. Es wird eine repräsentative Konfiguration betrachtet, bei der In- und Bi-Atome gleichmäßig verteilt sind. Wir haben die berechneten Gitterparameter von ternärem In . zusammengefasst y Ga 1−y N und Quartär In y Ga 1−y N 1−x Bi x Legierungen zusammen mit anderen theoretischen und experimentellen Daten in Abb. 1. Für reines GaN sind die Gitterparameter a =3,211, c =5.235 Å, was gut mit anderen theoretischen Berechnungen übereinstimmt a =3.155,3.22 , c =5.144,5.24 Å [39–41] und experimentelle Daten 3.19 Å für a , 5,19 für c [42]. Die Gitterparameter (a , c ) von In y Ga 1−y N steigt an, wenn die In-Zusammensetzung erhöht wird, und zeigt eine nahezu lineare Variation, wie in Abb. 1a gezeigt. Die vorliegenden Berechnungen sagen a . voraus =3.304 , c =5,365 Å für In 0,25 GaN und a =3.397 Å, c =5.509 Å für In 0.5 GaN, die alle gut mit früheren Ergebnissen von a . übereinstimmen =3,33 Å, c =5,39 Å für In 0,25 GaN und a =3.43,3.485 , c =5,55,5,488 für I n 0.5 GaN [39, 40, 43, 44]. Bei quartären Legierungen In y Ga 1−y N 1−x Bi x , für uns gibt es keine experimentellen und theoretischen Werte für strukturelle Eigenschaften. In Abb. 1b steigen die erhaltenen Gitterparameter mit zunehmenden In- und Bi-Zusammensetzungen ebenfalls fast linear an. Wegen der größeren Ionenradien von In- und Bi-Atomen als Ga- und N-Atomen führt die Substitution von In gegenüber Ga und Bi gegenüber N zu verbesserten Gitterparametern von InGaNBi.

Die Gitterparameter für a ternäre Legierungen In y Ga 1−y N , mit 0≤y ≤0.5 und b quaternäre Legierungen In y Ga 1−y N 1−x Bi x , mit 0≤x ≤0.09375, 0≤y 0,5. Zum Vergleich fügen wir einige andere Berechnungen und experimentelle Daten aus Lit. [39–44] in Abb. 1a. Die durchgezogene Linie steht für a und gestrichelte Linie ist c
Der Einbau von In und Bi wird die Kristallperiodizität brechen und eine geometrische Deformation in eine stark legierte Struktur einführen. Wir wählen In 0,25 GaN Bi 0,0625 als Beispiel für vier Statistiken zu chemischen Bindungen, wie in Abb. 2 gezeigt; die durchschnittlichen Längen der Ga-N-, In-N-, Ga-Bi- und In-Bi-Bindungen betragen 2.009, 2.195, 2.592 bzw. 2.704 . Beachten Sie, dass die Ga-N-Bindungslänge in reinem Bulk-GaN 1.970 Å beträgt. Die In-N-Bindungslänge ist größer als die von Ga-N, was darauf hindeutet, dass das In-Atom das N-Atom deutlich wegdrückt. In ähnlicher Weise bedeutet die größere Bindungslänge von Ga-Bi als von Ga-N, dass das Bi-Atom das Ga-Atom wegdrückt und eine gute Übereinstimmung mit der Ordnung der kovalenten Radien von Ga (1.22 ), In (1.42 ), N (0.71 Å), und Bi (1,48 Å) [45]. Andere Konfigurationen zeigen ein ähnliches Verhalten. Gitterverformung und Disparität in der Elektronegativität zwischen Wirt und Dotierstoff haben einen erheblichen Einfluss auf die elektronischen und optischen Eigenschaften.

Histogramm der Bindungslänge in In 0,25 GaNBi 0,0625 . Die Werte im Panel geben die durchschnittlichen Längen der vier Bindungsarten an
Elektronische Eigenschaften
Es wurde gezeigt, dass die funktionalen oder Korrekturpotentiale und der SOC-Effekt die vorhergesagte Genauigkeit der Bandlückenenergie der III-V-Legierung, des Valenzbandes und der Spin-Bahn-Aufspaltungsenergie stark beeinflussen. Daher validieren wir unsere Ergebnisse anhand des MBJLDA-Potentials und vergleichen sie mit anderen theoretischen Berechnungen und Experimenten. Abbildung 3 ist ein Diagramm der Bandlückenenergie gegenüber der In-Zusammensetzung in In . y Ga 1−y N sowie eine Anpassung an die Daten. Einige Bandlückenwerte, die durch Experimente erhalten wurden, sowie theoretische HSE06-, mBJ- und LMTO-CPA-MBJ-Funktionale sind ebenfalls aufgetragen. Die vorhergesagte Bandlücke von GaN beträgt 3,273 eV, was in guter Übereinstimmung mit aktuellen Berechnungen und Experimenten ist, 3,33 eV bei mBJ [40], 3,261, 3,23 eV bei HSE06 [39, 46] und 3,40–3,50 eV bei Experimenten [47– 49]. Wie in I beobachtet n y G a 1−y N, unsere DFT-Ergebnisse bestätigen, dass E g Werte von I n y G a 1−y N nimmt kontinuierlich ab als y von 0 auf 50 % erhöht. E g nimmt sanft von 3.273 auf 1.546 eV ab. Dies lässt sich gut mit denen aus theoretischen (HSE06, mBJ-Potentialen)[39, 40, 46] und experimentellen Ergebnissen [50, 51] vergleichen.
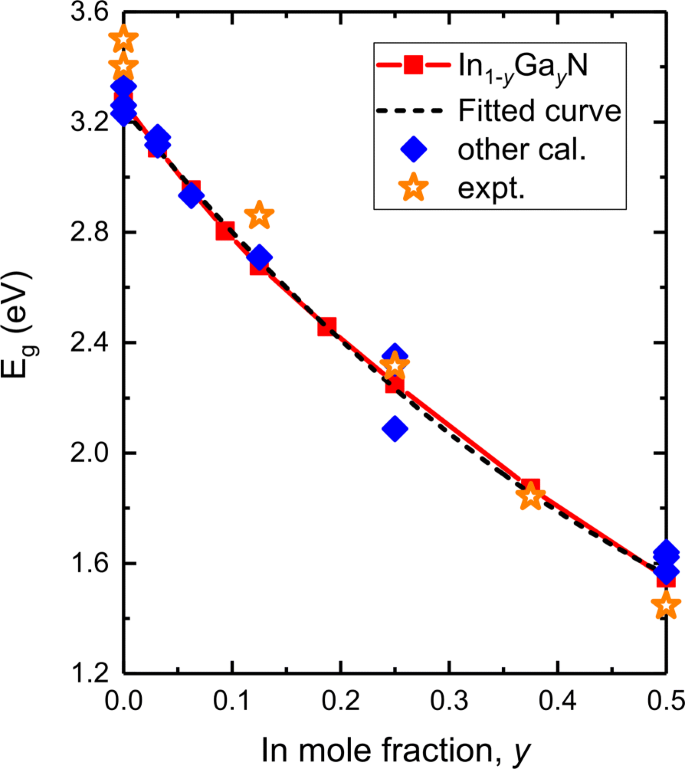
Vorhergesagte Bandlückenenergie (E g , rote durchgezogene Linie) als Funktion der In-Zusammensetzung in I n y G a 1−y N sowie eine Anpassung an die Daten (schwarze gestrichelte Linie). Andere theoretische [39, 40, 46] und experimentelle [47–51] Ergebnisse sind ebenfalls aufgetragen
Das Konturdiagramm für die Bandlücke von quartärem I n y G a 1−y N 1−x B ich x Legierungen ist in Abb. 4 dargestellt. Die Bandlücken der quaternären Legierungen zeigen einen nichtlinearen Trend als Funktion der Zusammensetzung, der mit steigendem In- und Bi-Gehalt abnimmt. Aus den Ergebnissen stellen wir fest, dass die InGaNBi-Bandlücke einen weiten Energiebereich von 3,273 bis 0,651 eV für Bi bis zu 9,375% und In bis zu 50% abdecken könnte, was dem Wellenlängenbereich von 0,38 bis 1,9 µm entspricht, was ihre potentiellen optoelektronischen Anwendungen in . anzeigt sichtbares Licht und mittleres Infrarot.

Konturdiagramm der Bandlückenwerte für I n y G a 1−y N 1−x B ich x Legierungen in Abhängigkeit von Bi(x ) und In(y ) Kompositionen
Im Vergleich zu InGaN induziert der Einbau von Bi eine stärkere Reduzierung der Bandlücke. Darüber hinaus jedoch ein signifikanter Anstieg der Δ SO wird aufgrund des starken SOC-Effekts von Wismut erhalten, bei dem die erweiterte Wechselwirkung zwischen dem Elektronenspin und dem Bahndrehimpuls die SO-Bandenergie verringert. Darüber hinaus verbessert die verbesserte Valenzbandkante, die aus dem Valenzband-Anti-Crossing-Effekt von Bismidlegierungen resultiert, auch stark Δ SO [28]. Unser berechnetes Δ SO die Werte betragen etwa 0,220 eV für 3,125%, 0,360 eV für 6,25% bzw. 0,600 eV für 9,375% Bi, was eine unbedeutende Variation mit dem Indiumanteil aufweist. Frühere Untersuchungen haben gezeigt, dass verschiedene Bi-Anordnungen einen großen Einfluss auf die Bandstrukturen von Bismidlegierungen haben, einschließlich der Spin-Bahn-Aufspaltungsenergie [21, 52]. Die vorliegenden Ergebnisse zeigen, dass das I n 0.5 G a N B ich 0.09375 Bandlückenwert (0,651 eV) liegt sehr nahe bei Δ SO (0,577 eV). Da die InGaN-Probe eine große Gitterfehlanpassung und eine schlechte Qualität für In-Gehalte von mehr als 55–60% [32] sowie die geringe Löslichkeit von Wismut in verdünnten Bismidlegierungen aufweist, setzen wir die Gehalte von In bis zu 50% und Bi bis zu 9,375%. Wir glauben, dass ein höherer Indium- oder Wismutgehalt Δ . erreichen wird SO >E g in einer quartären InGaNBi-Probe, um die Effizienz von InGaNBi-basierten LEDs und LDs zu verbessern.
Die projizierten Bandstrukturen und die Gesamtzustandsdichte (TDOS) von reinem GaN, I n 0,25 GaN und ich n 0,25 G a N B ich 0,03125 Legierungen sind in Abb. 5 dargestellt. Die Beiträge von In und Bi sind farblich hervorgehoben:Blau (rot) entspricht dem von In (Bi) stammenden Zustand. Die In-Substitution in I n 0,25 GaN hat großen Einfluss sowohl auf das Leitungsband als auch auf das Valenzband, wo das Leitungsbandminimum (CBM) zu niedrigeren Energien in Bezug auf das Fermi-Niveau verschoben wird und eine engere Energielücke widerspiegelt. Im Gegensatz zu Wismut, das die Defektbande in der verbotenen Lücke nahe dem Fermi-Niveau einführt, zeigen die In-Atome eine Hybridisierung mit dem tiefen Niveau des VB. Für quaternäre Legierung I n 0,25 G a N B ich 0,03125 , ist deutlich zu erkennen, dass die Verringerung der Bandlücke sowohl aus dem aufwärts gerichteten Valenzbandmaximum (VBM) als auch aus dem abwärts gerichteten CBM resultiert und sich die CBM im Vergleich zu I significantly signifikanter ändert n 0,25 GaN, das auf eine größere Druckspannung in InGaNBi durch die Zugabe von Wismut zurückzuführen ist. Das rot markierte Defektniveau weist eine starke Wechselwirkung mit der VB-Kante auf, die von der Hybridisierung hauptsächlich zwischen Bi- und nahen Ga-Atomen herrührt. Die TDOS in Abb. 5e spiegelt auch das lokale Defektniveau bei –1,0 bis –0,5 eV wider.
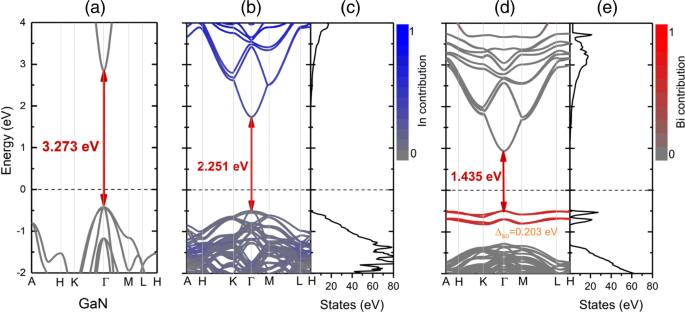
Die projizierten Bandstrukturen und ihre entsprechende Gesamtzustandsdichte (TDOS) von a GaN, b , c Ich n 0,25 G a N , und d , e Ich n 0,25 G a N B ich 0,03125 . Die schwarze gestrichelte Linie stellt das Fermi-Niveau dar, das auf Null gesetzt wird. Die relativen Beiträge von In und Bi sind farblich hervorgehoben:blau (rot) entspricht dem von In (Bi) ausgehenden Zustand
Stamm von InGaNBi auf GaN
Das [0001]-orientierte Ich n y G a 1−y Verspannte N/GaN-Quantentöpfe werden häufig in aktuellen LED- und LD-Bauelementen verwendet, bei denen I n y G a 1−y N-Schichten erleiden eine biaxiale Druckspannung. Lokale Schwankungen der Zusammensetzung und unterschiedliche kovalente Radien von In- und Ga-Atomen führen zu den Spannungen in I n y G a 1−y N-Schichten [53]. Abbildung 6 zeigt die Dehnung von InGaNBi auf einem GaN-Substrat. Da das Indiumatom größer als das Galliumatom ist, ist das Bismutatom größer als das Stickstoffatom; somit induziert der Einbau von In- und Bi-Atomen in InGaNBi eine Druckspannung von InGaNBi auf GaN. Es wird gezeigt, dass InGaNBi bei einem In-Gehalt von 50% und einem Bi-Gehalt von 9,375% einer hohen Druckspannung von 8,5% unterliegt. Für den In-Anteil innerhalb von 6,25% und für den Bi-Anteil innerhalb von 2,8% liegt die Dehnung von InGaNBi auf GaN innerhalb von 1%. Das heißt, durch Anpassen der In- und Bi-Zusammensetzungen kann InGaNBi auf GaN mit einer akzeptablen Dehnung entwickelt werden.

Dehnung von InGaNBi-Legierungen auf GaN-Substrat bei verschiedenen In (0–0.5) als Funktion des Bi-Anteils. Positive Dehnungswerte zeigen an, dass InGaNBi unter Druckspannung steht
Schlussfolgerungen
Die strukturellen, elektronischen Eigenschaften und die Dehnung von InGaNBi auf GaN gegenüber In- und Bi-Zusammensetzungen werden basierend auf der Dichtefunktionaltheorie untersucht. Die Gitterparameter von InGaNBi steigen mit zunehmender In- und Bi-Zusammensetzung fast linear an. Da In- und Bi-Atome den größeren Atomradius aufweisen als Ga- und N-Atome, sind die In-N- und Ga-Bi-Bindungslängen größer als die von Ga-N. Für elektronische Eigenschaften haben wir den Konturplot für die Bandlücke von quartärem I . gezeigt n y G a 1−y N 1−x B ich x Legierungen. Die Bandlücke der quaternären Legierungen könnte einen weiten Energiebereich von 3,273 bis 0,651 eV für Bi bis zu 9,375% und In bis zu 50% abdecken, was dem Wellenlängenbereich von 0,38 bis 1,9 µm entspricht. Das berechnete Δ SO die Werte betragen etwa 0,220 eV für 3,125%, 0,360 eV für 6,25% bzw. 0,600 eV für 9,375% Bi, was eine unbedeutende Variation mit dem Indiumanteil aufweist. Wir glauben, dass eine höhere Indium- oder Wismut-Zusammensetzung Δ . erreicht SO >E g in einer quartären InGaNBi-Probe, um die Effizienz von InGaNBi-basierten LEDs und LDs zu verbessern. Die Bandstrukturanalysen zeigen, dass Indium einen großen Einfluss auf CB und VB hat und Wismut eine starke Wechselwirkung mit der VB-Kante hat. Schließlich untersuchen wir die Spannung von InGaNBi auf GaN. Durch Anpassen der In- und Bi-Zusammensetzungen kann InGaNBi auf GaN mit einer akzeptablen Dehnung entwickelt werden.
Nanomaterialien
- Kohlenstofffaserverstärktes PPA für strukturelle Automobil- und Elektronikkomponenten
- Struktur und elektronische Eigenschaften von übergangsmetalldotiertem Kaolinit-Nanoton
- Modulation der elektronischen und optischen Anisotropieeigenschaften von ML-GaS durch vertikales elektrisches Feld
- Die Wirkung von Kontakt-Nichtgleichgewichtsplasma auf die strukturellen und magnetischen Eigenschaften von Mn Х Fe3 − X О4 Spinellen
- Optische und elektronische Eigenschaften von Femtosekundenlaser-induzierten Schwefel-hyperdotierten Silizium-N+/P-Photodioden
- Strukturelle und im sichtbaren Infrarotbereich sichtbare optische Eigenschaften von Cr-dotiertem TiO2 für farbige kühle Pigmente
- Untersuchung der strukturellen, elektronischen und magnetischen Eigenschaften von Ag n V (n = 1–12)-Clustern
- Abhängigkeit der Nanopartikeltoxizität von ihren physikalischen und chemischen Eigenschaften
- Eigenschaften und Überlegungen zum Design von Leiterplatten in der Automobilindustrie
- Eigenschaften und Zusammensetzung von Roheisen



