Infrarotreflexionsanalyse von epitaktischen n-dotierten GaN-Schichten, die auf Saphir gewachsen sind
Zusammenfassung
Infrarot (IR)-Reflexionsspektroskopie wird verwendet, um Si-dotierte Mehrschicht-n + . zu untersuchen /n0 /n + -GaN-Struktur gewachsen auf GaN-Puffer mit GaN-Template/Saphir-Substrat. Die Analyse der untersuchten Struktur durch Photoätz-, SEM- und SIMS-Methoden zeigte die Existenz der zusätzlichen Schicht mit dem drastischen Unterschied in den Si- und O-Dotierungsniveaus, die sich zwischen dem epitaktischen GaN-Puffer und dem Templat befindet. Die Simulation der experimentellen Reflektivitätsspektren wurde in einem breiten Frequenzbereich durchgeführt. Es wird gezeigt, dass die Modellierung des IR-Reflexionsspektrums mit der 2 × 2-Transfermatrixmethode und die Einbeziehung der zusätzlichen Schicht in die Analyse eine optimale Anpassung des experimentellen Spektrums ermöglicht, was bei der Bewertung von GaN-Schichtdicken, die gut sind Übereinstimmung mit den SEM- und SIMS-Daten. Die spektrale Abhängigkeit der plasmonen-LO-Phonon-gekoppelten Moden für jede GaN-Schicht wird aus der spektralen Abhängigkeit des Dielektrikums der Si-Dotierungsverunreinigung erhalten, die auf Kompensationseffekte durch die Akzeptorzustände zurückgeführt wird.
Hintergrund
In den letzten Jahren gab es ein großes Interesse an III-Nitrid-Materialien, insbesondere an GaN [1, 2]. Aufgrund des Durchbruchs bei den Wachstumstechniken haben epitaktische GaN-Filme breite Anwendung in optoelektronischen Geräten wie blauen und ultravioletten Leuchtdioden (LEDs) [3], Lasern [4] und mikroelektronischen Geräten, z. B. Hochleistungs- und Hochfrequenz-Feldeffekttransistoren [5, 6]. Konzentration und Mobilität freier Träger sind die Schlüsselparameter, die die Leistungsfähigkeit des Geräts in Anwendungen bestimmen. Die Hall-Messung der Konzentration und Mobilität freier Ladungsträger in mehrschichtigen GaN-basierten Bauelementstrukturen ist keine triviale und zeitaufwendige technologische Aufgabe, die ohmsche Kontakte an jeder Messschicht und spezielle Messverfahren erfordert.
Fourier-Transformations-Infrarot(IR)-Reflexionsspektroskopie und Raman-Spektroskopie sind berührungslose und zerstörungsfreie Methoden, die es ermöglichen, nicht nur die Phononenschwingungen zu untersuchen, sondern auch die Trägereigenschaften zu charakterisieren [7]. Das bekannte Problem der konfokalen Mikro-Raman-Spektroskopie ist jedoch eine Verschlechterung der räumlichen Tiefenauflösung aufgrund der Lichtbrechung [8]. Es wurde in Ref. gezeigt. [6] dass beim Tiefenscannen einer mehrschichtigen GaN-Struktur mit einer Anregungswellenlänge von 488.0 nm die Tiefenauflösung nur etwa 1.8 μm beträgt, während die laterale Auflösung etwa 210 nm beträgt. Die IR-Spektroskopie überwindet dieses Problem aufgrund der hohen Empfindlichkeit gegenüber der Schichtdicke aufgrund von Interferenzeffekten und dem Einfluss der Brechungsindexdispersion in einem weiten Spektralbereich.
IR-Reflexionsspektren von dünnen GaN-Filmen wurden bereits 1973 von A.S. Baker [9], aber die räumliche Inhomogenität und die insgesamt geringe strukturelle Qualität solcher Filme schränkten die praktische Anwendung der erhaltenen Ergebnisse erheblich ein. Dennoch wurde eine Möglichkeit demonstriert, Parameter der optischen Phononen und der Absorption freier Ladungsträger in dünnen GaN-Filmen zu bestimmen. Die detaillierten Studien des longitudinalen optischen Phonons– plasmonengekoppelte (LOPC) Modi in Bulk-GaN wurden von Perlin et al. [10] mit Raman-Spektroskopie und von Shubert et al. [11] unter Verwendung von IR-Ellipsometrie. Der Einfluss verschiedener Substrate auf die optischen Eigenschaften von kubischen und Wurtzit-GaN-Filmen wurde ebenfalls im Detail untersucht [12, 13]. In Anbetracht des Mangels an nativen GaN-Substraten wurde gezeigt, dass die Verwendung von Saphirsubstraten für das epitaktische Wachstum von GaN-Filmen optimal für die Nutzung in Geräten ist, die bei hohen Temperaturen betrieben werden. IR-Reflexionsspektroskopie-Untersuchungen an hexagonalem Saphir [14] zeigten ein komplexes Spektrum, dessen Form stark von der Polarisation und dem Einfallswinkel abhängt. Dies erschwert Messungen und die Bestimmung der spektralen Eigenschaften von Phononenmoden und Eigenschaften freier Ladungsträger in dünnen GaN-Filmen, die auf Saphirsubstraten gewachsen sind, erheblich.
Daher sind die richtige Auswahl des Spektralanalysealgorithmus und die Form der dielektrischen Funktion von großer Bedeutung für die Analyse der IR-Reflexionsspektren von mehrschichtigen GaN-auf-Saphir-Strukturen [15,16,17]. Dieses Papier zeigt eine Möglichkeit der Anwendung der IR-Reflexionsspektroskopie und der 2 × 2-Transfermatrix-Methode zur Analyse planarer GaN-basierter Mehrschichtstrukturen mit ungleichmäßiger Tiefe und Dotierungsprofilen, die in der Praxis verschiedene Arten von Halbleitern sein können III-Nitrid- basierte Gerätestrukturen mit vertikalem Design, wie lichtemittierende und gleichrichtende Dioden, Gunn-Dioden, Transistoren mit hoher Elektronenmobilität (HEMTs) usw.
Methoden
Experimentell
Die untersuchten n + /n0 /n + -GaN-Strukturen wurden auf MOCVD-GaN-Templates auf Al2 . gezüchtet O3 (0001) Substrate bei einer Temperatur von 800 °C durch plasmaunterstützte Molekularstrahlepitaxie mit einem N2 Flussrate von 0,5 sccm und einer HF-Plasmaleistung von 350 W (Abb. 1). Daraus ergibt sich eine Wachstumsrate von ∼ 0,27 ML s −1 . Zuerst wurde ein 0,3 µm dicker GaN-Puffer auf einer MOCVD-GaN-Vorlage gezüchtet. Auf eine 0,8 µm dicke Si-dotierte GaN-Schicht folgte eine 1,75 µm dicke undotierte GaN-Schicht und eine 0,4 µm dicke Si-dotierte GaN-Schicht (Abb. 1). Die nominelle Si-Dotierungskonzentration des n + -GaN-Schichten:10 19 cm −3 .
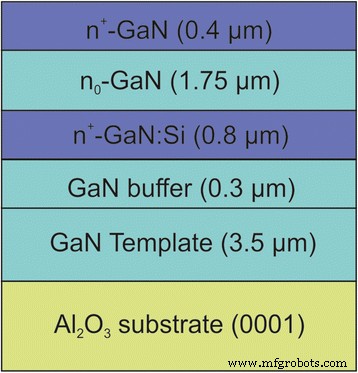
Schema des untersuchten n + /n0 /n + -GaN-Struktur aufgewachsen auf GaN-Template/(0001) Saphir-Substrat
Um die Bereiche unterschiedlicher Ladungsträgerkonzentration zu untersuchen, wurde die gespaltene Kante der untersuchten Struktur durch das Photoätzverfahren in einer stromlosen Konfiguration mit K2 . untersucht S2 O8 –KOH wässrige Lösung (KSO-D Ätzsystem) [18]. Diese Methode ermöglicht das Aufdecken der Bereiche unterschiedlicher Ladungsträgerkonzentration und die Visualisierung der relativen Ladungsträgerkonzentrationsunterschiede durch Messung der Ätzrate unter Verwendung von Oberflächenprofilen [19, 20]. Der Querschnitt der untersuchten Probe wurde 3 min lang photogeätzt. Anschließend wurden die Proben mittels Rasterelektronenmikroskopie (REM) untersucht.
Sekundärionen-Massenspektroskopie (SIMS)-Studien von Proben wurden auf einem CAMECA IMS6F-System unter Verwendung eines Cäsiums (Cs + ) Primärstrahl, wobei der Strom bei 400 nA gehalten wird, um das Profil der Verunreinigungen zu finden. Die Größe des Rasters betrug etwa 50 × 50 μm 2 . , und die Sekundärionen wurden aus einem zentralen Bereich mit einem Durchmesser von 30 &mgr;m gesammelt. Für H, C, O und Si wurden die Konzentrationen von H–, O–, C–, Si– abgeleitet, und das Matrixsignal Ga– wurde als Referenz verwendet.
Die Infrarot-Reflexionsspektroskopie-Messungen im Spektralbereich von 300–4000 cm −1 mit der spektralen Auflösung von 1 cm −1 wurden bei Raumtemperatur mit einem Bruker Vertex 70 V FTIR-Spektrometer, ausgestattet mit einer Globar-Quelle und einem deuterierten Triglycinsulfat (DLaTGS)-Detektor mit Polyethylenfenster, durchgeführt. Der Einfallswinkel betrug 11°. S -polarisierte Spektren wurden unter Verwendung des KRS-5-Polarisators gemessen. Als Referenz diente das Reflexionsspektrum eines Goldspiegels.
Beschreibung des optischen Analysemodells
Der Reflexionsgrad des Systems Schicht/Substrat wurde mit der 2 × 2-Transfermatrixmethode [17, 21] berechnet, bei der eine beliebige Anzahl von Schichten aufgenommen werden kann und Interferenzeffekte innerhalb der Filme automatisch berücksichtigt werden. 2 × 2 Transfermatrixmethode für isotrope Schichtsysteme ermöglicht eine unabhängige Berechnung von s - und p -polarisierte Reflexions- und Transmissionsspektren bei Schichtsystemen bestehend aus homogenen zweiachsigen oder einachsigen isotropen Platten, deren c-Achse auf die z-Achse der Laborkoordinaten ausgerichtet ist. In diesem Fall kann die 2 × 2-Schichtsystem-Transfermatrix in der folgenden Ansicht dargestellt werden [21]:
$$ {\left(\begin{array}{c}\hfill {E}_0^{+}\hfill \\ {}\hfill {E}_0^{-}\hfill \end{array}\right) }_{s/p}=\frac{1}{t_{0,1}^{s/p}}\left(\begin{array}{cc}\hfill 1\hfill &\hfill -{r} _{1,0}^{s/p}\hfill \\ {}\hfill {r}_{1,0}^{s/p}\hfill &\hfill 1\hfill \end{array}\right ){\displaystyle \prod_{l=1}^N{T}_{l/\left(l+1\right)}^{s/p}{\left(\begin{array}{c}\hfill {E^{\prime}}_{N+1}^{+}\hfill \\ {}\hfill {E^{\prime}}_{N+1}^{-}\hfill \end{array }\right)}_{s/p}}={\left(\begin{array}{cc}\hfill {T}_{11}\hfill &\hfill {T}_{12}\hfill \\ {}\hfill {T}_{21}\hfill &\hfill {T}_{22}\hfill \end{array}\right)}_{s/p}{\left(\begin{array}{ c}\hfill {E^{\prime}}_{N+1}^{+}\hfill \\ {}\hfill {E^{\prime}}_{N+1}^{-}\hfill \end{array}\right)}_{s/p}. $$ (1)Sternchen in den oberen Indizes der Feldamplitude im Austrittsmedium werden in Gl. (1) um die Werte der elektrischen Feldkomponenten genau auf der rechten Seite des N . zu berücksichtigen /N + 1 Schnittstelle.
Die \( 2\times 2\kern0.24em {T}_{l,\left(l+1\right)}^{s/p}\)-Transfermatrix berücksichtigt die Ausbreitung ebener Wellen vom l -te Schicht, Mehrfachreflexionen innerhalb dieser Schicht und Einfluss von l/(l + 1) Schnittstelle. Eine solche Matrix kann bestimmt werden als [17]:
$$ {T}_{l/\left(l+1\right)}^{s/p}=\frac{1}{t_{l/\left(l+1\right)}^{s/ p}}\left(\begin{array}{cc}\hfill \exp \left(i{\delta}_l^{s/p}\right)\hfill &\hfill -{r}_{l+1 ,l}^{s/p} \exp \left(i{\delta}_l^{s/p}\right)\hfill \\ {}\hfill {r}_{l,l+1}^{ s/p} \exp \left(-i{\delta}_l^{s/p}\right)\hfill &\hfill \exp \left(-i{\delta}_l^{s/p}\right )\hfill \end{array}\right), $$ (2)wobei \( {r}_{l,l+1}^{s/p} \) und \( {t}_{l,l+1}^{s/p} \) Teilreflexions- und Transmissionskoeffizienten bezeichnen für l/(l + 1) Grenzfläche, \( {\delta}_l^{s/p} \) ist die Phasenverschiebung, die dem Licht nach der Ausbreitung durch die l- Schicht für s - und p -polarisiertes Licht.
Phasenverschiebung für s - und p -polarisiertes Licht nach dem Durchgang durch das l- Schicht kann bestimmt werden als [17]:
$$ {\delta}_l^{s/p}=\frac{2\pi {d}_l}{\lambda }{n}_{l,s/p} \cos {\theta}_{l, s/p}=\frac{2\pi {d}_l}{\lambda }{n}_l\sqrt{1-{\left(\frac{1}{n_{l,s/p}} \sin \theta \right)}^2}, $$ (3)wo n l ist der komplexer Brechungsindex für das l- Schicht, d l ist die Dicke des l- Schicht und θ ist der Einfallswinkel.
Partielle Reflexions- und Transmissionskoeffizienten für die s - und p -Polarisationen können mit Fresnel-Gleichungen berechnet werden. Zum Beispiel Teilreflexion und Transmissionskoeffizienten für die s -Polarisation haben die folgende Form [21]:
$$ \begin{array}{l}{r}_{l,l+1}^s=\frac{n_{ls} \cos {\theta}_{ls}-{n}_{\left( l+1\right)s} \cos {\theta}_{\left(l+1\right)s}}{n_{ls} \cos {\theta}_{ls}-{n}_{\ left(l+1\right)s} \cos {\theta}_{\left(l+1\right)s}}\\ {}{t}_{l,l+1}^s=\frac {2{n}_{ls} \cos {\theta}_{ls}}{n_{ls} \cos {\theta}_{ls}+{n}_{\left(l+1\right) s} \cos {\theta}_{\left(l+1\right)s}}\end{array} $$ (4)Die komplexen Reflexionsverhältnisse des Mehrschichtstapels können somit erhalten werden, indem die Teilreflexions- und Transmissionskoeffizienten für N + 1 . eingesetzt werden Schnittstelle (Gl. (4)) in Gl. (1) und Phasenverschiebungen aller N Schichten (Gl. (3)):
$$ {R}_{s/p}={\left|{r}_{0,N+1}^{s/p}\right|}^2={\left|\frac{T_{21 }}{T_{11}}\right|}^2. $$IR-dielektrisches Funktionsmodell
Brechungsindex hängt von der komplexen dielektrischen Funktion ab ε (ω ), die geschrieben werden kann als:
$$ \varepsilon \left(\omega \right)={\varepsilon}^{\mathrm{lat}}\left(\omega \right)+{\varepsilon}^{\mathrm{fc}}\left(\ Omega \rechts). $$ (5)Der erste Term entspricht dem Beitrag der Gittermodendispersion und der zweite Term der Anregung durch freie Träger.
Der Beitrag der Gittermoden zur IR-Reaktion ε lat (ω ) bei Phononenenergie ℏω kann mit einem faktorisierten Modell mit Lorentz-Verbreiterung beschrieben werden [22]:
$$ {\varepsilon}^{\mathrm{lat}}\left(\omega \right)={\varepsilon}_{\infty }{\displaystyle \prod_{k=1}^M\frac{\omega_{ \mathrm{LO}k}^2-{\omega}^2-i\omega {\gamma}_{\mathrm{LO}k}}{\omega_{\mathrm{TO}k}^2-{\ omega}^2-i\omega {\gamma}_{\mathrm{TO}k}}}, $$ (6)wo M ist die Anzahl der infrarotaktiven Polarphonon-Modi für s - oder p -Polarisationen zum c- Achse; ωLOk und ωTOk sind die Frequenzen (cm −1 ) der k- th LO und TO Phonon; γLOk und γTOk sind ihre Dämpfungskonstanten (cm −1 ). Für GaN sind die Parameter ωLOk und ωTOk Konto für das E 1 (LO), A 1 (LO) und E 1 (TO) und A 1 (TO) Schwingungsmodi [23].
Der Beitrag der freien Trägerspezies ε fc (ω ) auf die dielektrische Funktion kann mit der klassischen Drude-Approximation [15] beschrieben werden:
$$ {\varepsilon}^{\mathrm{fc}}\left(\omega \right)=-{\varepsilon}_{\infty}\frac{\omega_p^2}{\omega \left(\omega + i{\gamma}_p\right)}, $$ (7)mit
$$ {\omega}_p={\left(\frac{N{e}^2}{\varepsilon_{\infty }{\varepsilon}_0{m}^{\ast }}\right)}^{1 /2} $$ (8) $$ {\gamma}_p=\frac{e}{m^{\ast}\mu} $$ (9)Die abgeschirmten Plasmafrequenzen ω p (Gl. (8)) hängen von der freien Trägerkonzentration N . ab , hochfrequente dielektrische Permittivität ε ∞ , und die effektive Masse m ∗ der freien Träger (ε 0 ist die Vakuumpermittivität und e ist die elektrische Einheitsladung). Der Plasmonen-Dämpfungsparameter γ p abhängig von der optischen Trägermobilität μ (Gl. (9)) [24].
Parameter von ωLO und LOPC-Moden können aus dem Imaginärteil der Energieverlustfunktion bestimmt werden – \( \mathrm{I}\mathrm{m}\left(-\frac{1}{\varepsilon \left(\omega \right)}\ rechts) \) [7], wobei ε (ω ) ist die komplexe dielektrische Funktion, die aus Gl. (5).
Ergebnisse und Diskussion
REM-Aufnahme (Abb. 2) zeigt den photogeätzten Querschnitt von n + /n0 /n + -GaN-Struktur gewachsen auf GaN-Puffer/GaN-Template/Saphir-Substrat, wo sechs verschiedene Schichten deutlich sichtbar sind, das sind fünf GaN-Schichten mit unterschiedlicher Ladungsträgerkonzentration und Saphir-Substrat. Es sollte angemerkt werden, dass die durch SEM gemessene Gesamtdicke der untersuchten GaN-Struktur mit der technologischen übereinstimmt, und die beobachteten GaN-Schichten gemäß Abb. 1 können vorläufig dem nominellen oberen Si-dotierten n + Region (Schicht 1), undotiert n0 Region (Schicht 2), unten Si-dotiert n + Region (Schicht 3), undotierter GaN-Puffer (Schicht 4) und GaN-Template.
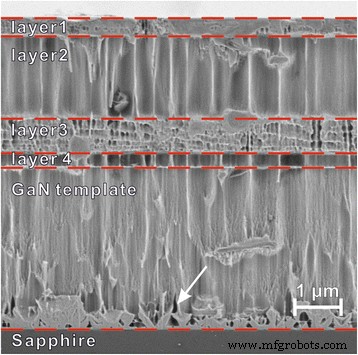
REM-Aufnahme des Querschnitts des untersuchten n + /n0 /n + -GaN-Struktur. Das unregelmäßige Muster vertikaler Linien wurde während des Spaltens (d. h. vor dem Fotoätzen) gebildet und ist charakteristisch für die nicht polierten Spalten von Al2 O3 /GaN-Heterostrukturen. Raue Pyramidenschicht (Pinholes ) an der Saphir/GaN-Vorlage, angezeigt durch den Pfeil wurde durch Fotoätzen freigelegt
Um einen tieferen Einblick in den Verunreinigungs-/Dotierungsgrad der untersuchten Proben zu erhalten, wurden außerdem SIMS-Messungen durchgeführt. Die erhaltenen SIMS-Profile (Abb. 3) korrelieren gut mit der nominellen Dicke der GaN-Schichten und der Gesamtdicke der untersuchten Mehrschichtstruktur. Alle untersuchten Elemente (H, C, O, Si) lagen über der Nachweisgrenze (3 bis 5 × 10 16 at/cm 3 ) der SIMS-Technik.
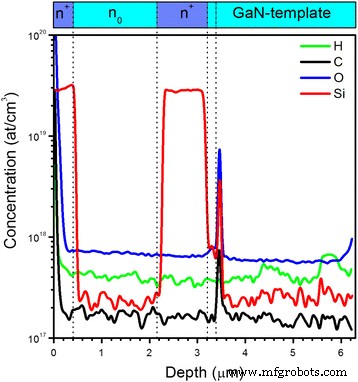
Verunreinigungselementprofile der untersuchten n + /n0 /n + -GaN-Struktur gemessen mit SIMS von der Probenoberfläche
Das Profil der beabsichtigten Si-Dotierung stimmt im Allgemeinen mit dem nominellen Dotierungsprofil mit einer Konzentration von etwa 2,8 × 10 19 . überein cm −3 im dotierten oberen und unteren n + Regionen und von etwa 2,3 × 10 17 cm −3 im undotierten n0 Region. Wie jedoch aus den SIMS-Daten ersichtlich ist, gibt es auch eine dünne (<50 nm)-Delta-Schicht mit einer Si-Konzentration von 1,1 × 10 19 cm −3 zwischen GaN-Puffer und GaN-Templat. Es sollte beachtet werden, dass die Si-dotierte Deltaschicht auch höhere Konzentrationen an unbeabsichtigten Sauerstoff- und Kohlenstoffverunreinigungen von 2,4 × 10 19 . enthält cm −3 und 1,4 × 10 18 cm −3 , entsprechend. Diese Delta-Schicht steht im Zusammenhang mit der homoepitaktischen Regrowth-Grenzfläche, die typischerweise aus der Verunreinigung des GaN-Templats mit O-, Si- und C-Verunreinigungen entsteht, die während des technologischen Ladeprozesses oder zu Beginn des Regrowths aus der Atmosphäre absorbiert werden [25, 26].
Wie oben diskutiert, liefern REM-Querschnitt und SIMS-Analyse die Struktur von GaN-Schichten, die sich von den nominellen Parametern durch Anregung des zusätzlichen GaN-Bereichs unterscheidet, jedoch mit der Gesamtdicke in Übereinstimmung mit der nominellen. Um den Einfluss der oben gefundenen zusätzlichen GaN-Delta-Schicht auf das IR-Reflexionsspektrum der untersuchten Struktur zu verdeutlichen, wurde die Simulation des experimentellen Spektrums durch Konstruktion von Modellen bestehend aus sechs Schichten, die den nominellen technologischen Parametern entsprechen, REM-Bilder ( Abb. 1) und sieben Schichten nach SIMS. Die berechneten Spektren basierend auf den oben beschriebenen Modellen sind in Abb. 4 dargestellt.

Simulationen der IR-Reflexionsspektren mit unterschiedlicher Schichtanzahl. Das experimentelle Spektrum des untersuchten n + /n0 /n + -GaN-Struktur wird durch durchgezogene Linie . gezeigt . a Reststrahlen-Region. b Die vergrößerten Spektren im Bereich über 750 cm −1
Wie aus Fig. 4 ersichtlich ist, ergibt das auf dem SIMS-Profil basierende Siebenschichtmodell die beste Annäherung an das experimentelle IR-Reflexionsspektrum. Daher werden weitere Simulationen und Analysen unter Verwendung dieses Modells mit modifizierten Parametern im Vergleich zu den nominell technologischen (Abb. 1) durchgeführt, und das die zusätzliche Schicht zwischen der technologischen GaN-Pufferschicht und der GaN-Vorlage berücksichtigt (Abb. 5).
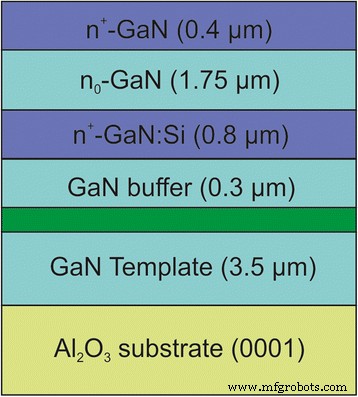
Das 7-Schichten-Modell zur Simulation der IR-Reflexionsspektren des untersuchten n + /n0 /n + -GaN-Struktur. Eine zusätzliche Schicht (grün ) ist eine dünne Grenzschicht zwischen GaN-Templat und den untersuchten GaN-Schichten
Abbildung 6 zeigt experimentelle und angepasste theoretische s -polarisierte Reflexionsspektren der untersuchten Struktur bei 11° Einfallswinkel. Das berechnete Spektrum basiert auf dem oben beschriebenen Modell (Abb. 5). Die Dispersion des komplexen Brechungsindex für die GaN-Schichten und das Saphirsubstrat wurde unter Verwendung von Gl. (5). Das Saphirsubstrat wurde als semi-unendlich angesehen, was es erlaubte, die internen Reflexionen innerhalb des Substrats und von der nicht polierten Rückseite zu vernachlässigen. Die im Reststrahlenbereich des Spektrums beobachtete komplizierte Struktur ist auf eine Kombination des überlappenden GaN und Al2 . zurückzuführen O3 Reststrahlenbänder zusammen mit Interferenzeffekten. Der Vergleich dieser Daten mit den berechneten Spektren kann nicht nur Dickeninformationen über die verschiedenen Schichten der Proben liefern, sondern auch helfen, die komplizierte Struktur der Reststrahlenregion im Hinblick auf die Beiträge der verschiedenen Materialien zu interpretieren.

Experimentell (durchgezogene Linie ) und Best-Fit-Berechnung (Strich-Punkt-Linie ) IR-Reflexionsspektren des n + /n0 /n + -GaN-Struktur gewachsen auf GaN-Template/Al2 O3 . a Reststrahlen-Region. b Störregion
Die Schichtdickenbestimmung aus dem Vergleich der Remissionsdaten mit dem berechneten Spektrum erfolgt in zwei Schritten [27]. Zuerst die Streifen im transparenten Bereich über den Reststrahlenbändern (ω > 1200 cm −1 ) sind auf Interferenzeffekte auf die Schichten der Mehrschichtstruktur zurückzuführen. Auf diese Weise kann die Gesamtdicke der untersuchten Struktur, die sich aus der Summe aller Schichten ergibt, abgeschätzt werden.
Sobald die Stapeldicke bekannt ist, können die einzelnen Dicken jeder Schicht bestimmt werden, indem die berechneten Spektren an Interferenzeffekte im Reststrahlenbereich des Spektrums angepasst werden. Die Schichtdicken wurden unter Berücksichtigung der zuvor ermittelten Gesamtdicke variiert. Unter dieser Einschränkung ist das Reflexionsvermögen über 1200 cm −1 ändert sich nicht wesentlich. Die Interferenzeffekte im Reststrahlenbereich können von anderen Merkmalen wie TO- und LO-Schwingungsmoden dadurch unterschieden werden, dass sich die Interferenzstreifen bei Variation der Schichtdicken verschieben [28].
Bei der Approximation des experimentellen Spektrums im Reststrahlenbereich wurden folgende Modellparameter variiert:Dämpfungsparameter γLO und γTO für E 1 (LO) und E 1 (TO) Phononenmodi; Plasmafrequenz ω p ; Plasmonen-Dämpfungsparameter γ p ; und Schichtdicken. Es ist zu beachten, dass nur E 1 Symmetriephononen sind IR-aktiv in s -Polarisation [9]. Anfangsfrequenzen von E 1 (LO) und E 1 (TO)-Phononen für GaN- und Saphir-Substrat wurden den IR-Reflexions- [29] und Raman-Streuungsexperimenten [6, 14] entnommen. Typische Werte der GaN-Phononenfrequenz sind ωTO = 560 cm −1 und ωLO = 740 cm −1 . Die Phononenfrequenzen für jede Schicht wurden im Anpassungsprozess verfeinert. Die erhaltenen Best-Fit-Parameter mit den Fehlerbalken sind in Tabelle 1 aufgeführt. Es ist zu beachten, dass die beim Fitting-Prozess erhaltenen Schichtdicken gut mit den REM-Daten übereinstimmen.
Bezugnehmend auf Fig. 6a, der Reflexionspeak bei ~450 cm –1 ist auf das Saphirsubstrat zurückzuführen. Die im Bereich von 500–740 cm −1 . beobachteten Merkmale sind auf eine Kombination überlappender Merkmale von GaN-Schichten und Saphir-Reststrahlen-Bändern zurückzuführen. Zur tieferen Analyse wurden die IR-Reflexionsspektren von Bulk-GaN und einer 6,78 µm dicken GaN-Schicht auf Saphir simuliert, wobei die Dicke des GaN der Gesamtdicke der untersuchten Struktur entsprach (Abb. 7) . Wie aus Abb. 7 ersichtlich, sind die Reflexionsspektren der 6,78-dicken GaN-Schicht auf Saphir und Bulk-GaN im Bereich von 500–740 cm −1 ähneln dem experimentellen Spektrum. Das kleine Merkmal bei ~511 cm −1 ist mit dem Saphirsubstrat verbunden. Es sollte erwähnt werden, dass bei ~736 cm −1 , es gibt einen schwachen Einbruch, der A . entspricht 1 (LO) Modus der GaN-Vorlage. Nach den Auswahlregeln A 1 (LO) Modus ist in s verboten -polarisierte IR-Spektren [9]. Der mögliche Grund für die Registrierung dieser verbotenen Mode könnte ein Polarisationsverlust aufgrund der Öffnung des Reflexionszubehörs sowie Mikroinhomogenitäten der GaN-Kristallstruktur sein. Dies kann insbesondere durch die Neigung des c . verursacht werden -Achse der säulenartigen Wurtzit-Struktur von GaN aus der Richtung senkrecht zur Wachstumsebene des Films. Dieser Modus wurde in unserer Modellierung wegen seines geringen Einflusses auf das resultierende Spektrum nicht berücksichtigt. Die Merkmale im Bereich von 750–1200 cm −1 sind auf überlappende GaN:Si- und Saphir-Reststrahlen-Bänder und Grenzflächeneffekte zurückzuführen. Der Abfall bei ~775 cm −1 hängt mit dem Grenzflächeneffekt am Rand des Reststrahlenbandes von GaN-Schichten und Saphir zusammen. Die breite Senke bei ~825 cm −1 ist mit einer Überlappung des Hochfrequenzzweigs des Plasmon-LO-Phonon-gekoppelten Modus (LPP + ) der n + Schichten.
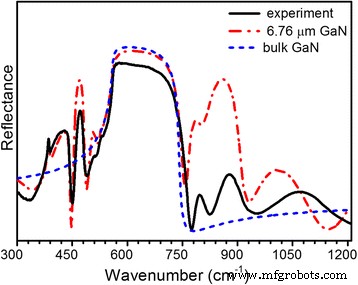
Experimentell (durchgezogene Linie ) IR-Reflexionsspektren des untersuchten n + /n0 /n + -GaN-Struktur und berechnete Reflexionsspektren einer 6,78 µm dicken GaN-Schicht auf Saphir (strichpunktierte Linie ) und Bulk-GaN (gestrichelte Linie )
Abbildung 8 zeigt die berechneten Imaginärteile der Energieverlustfunktion für jede Schicht gemäß den in Tabelle 1 angegebenen Oszillatorparametern zur Schätzung von E 1 -LOPC-Modi. Wie man sieht, ist der Hochfrequenzzweig der LOPC-Modi (LPP + ) bei Trägerkonzentrationen unter 10 17 cm −3 (n0 Ebene und Vorlage) stimmen fast mit E überein 1 (LO) Phononenmodus. Der Anstieg der Ladungsträgerkonzentration im Bereich von 2 × 10 17 –3 × 10 18 cm −3 (Abb. 5) führt zu einer signifikanten Hochfrequenzverschiebung und Verbreiterung des LPP + -Zweig, der die Zunahme der Wechselwirkung zwischen LO-Phonon und -Plasmon und die Abnahme der Mobilität von Ladungsträgern anzeigt. Dieses Verhalten von LPP + Zweig stimmt gut mit den experimentellen Daten zum IR-Reflexionsvermögen von Si-dotierten GaN-Filmen überein, die von Z.F. Liet al. [30] und Raman-Messung in Bulk-GaN [10] und epitaktischen Schichten [31]. Es sollte beachtet werden, dass die Niederfrequenz-LPP − Zweig des LOPC kann in unserem Fall nicht zuverlässig definiert werden, da s -polarisierte IR-Reflexionsspektren wurden im Niederfrequenzbereich unter 300 cm −1 . nicht gemessen .

Berechneter imaginärer Teil der dielektrischen Funktion, erhalten für jede analysierte GaN-Schicht aus der Best-Fit-Datenanalyse
Die in Tabelle 2 aufgeführten Werte der Trägerkonzentration und Mobilität wurden unter Verwendung von Gl. (8) und (9) mit einer effektiven Elektronenmasse m* von 0,2 m0 [32]. Es ist ersichtlich, dass das berechnete Trägerkonzentrationsprofil ähnlich dem durch SIMS-Messungen erhaltenen Si-Störstellenkonzentrationsprofil ist (Fig. 3), jedoch mit um eine Größenordnung niedrigeren Trägerkonzentrationen im Vergleich zur Konzentration von Si-Störstellen. Eine solche Diskrepanz in den Konzentrationen von Ladungsträgern und Dotierungsverunreinigungen wurde früher von M. Bockowski et al. beobachtet. [33] und wurde mit Kompensationseffekten durch Akzeptorzustände (wahrscheinlich durch Galliumleerstellen) in Verbindung gebracht, deren Bildungsenergie mit zunehmender n-Dotierung abnimmt [34]. Es sollte erwähnt werden, dass die Trägerkonzentration für das n + Ebenen in der Größenordnung von ~10 18 cm −3 stimmt gut mit den Ergebnissen unserer Raman-Studien ähnlicher GaN-Strukturen auf der Grundlage der Analyse von LOPC-Modi überein [6]. Die erhaltene Abnahme der Ladungsträgermobilität μ mit der Ladungsträgerkonzentration stimmt auch gut mit Hall-Experimenten in GaN [35] und theoretischen Modellierungen [36] überein.
Die Werte der dielektrischen Hochfrequenz-Permittivität ε∞ lagen im Bereich von 4,99–5,35 (Tabelle 1). Die Zunahme von ε∞ für das dotierte n + Schichten im Vergleich zu n0 Schichten können mit der Rotverschiebung der α-GaN-Bandlücke in Verbindung gebracht werden [37]. Es ist zu beachten, dass Werte von ε∞ nur für niedrigleitende Filme mit relativ geringem Fehler bestimmt werden. Genauigkeit bei der Bestimmung von ε∞ sinkt mit der Ladungsträgerkonzentration, was damit zusammenhängt, dass die ε∞ Parameter berücksichtigt „die Hochfrequenz“-Grenze, wenn die dielektrische Modellfunktion auf kürzere Wellenzahlen als die hier untersuchten extrapoliert wird [11]. Der große Spektralbereich von 300–4000 cm −1 wurde analysiert, um den Fehler bei der Bestimmung von ε∞ . zu verringern und andere Parameter, die an der Modellierung der IR-Reflexionsspektren von n + . beteiligt sind Schichten.
Schlussfolgerungen
IR-Reflexionsspektren der Multilayer-Struktur, bestehend aus GaN-Schichten, die auf einem Saphirsubstrat aufgewachsen und mit unterschiedlichen Konzentrationen an Si-Störstellen dotiert waren, wurden gemessen und detailliert analysiert. Die Analyse der untersuchten Struktur mittels SEM des photogeätzten Querschnitts zeigte eine gute Korrelation mit den technologischen Parametern der GaN-Schichten. Die SIMS-Analyse zeigte auch das Vorhandensein einer dünnen Delta-Schicht in der Nähe der Grenzfläche GaN-Puffer/GaN-Schablone mit einem höheren Gehalt an Si- und O-Verunreinigungen, die mit der homoepitaktischen Nachwachsen-Grenzfläche zusammenhängt. Die Modellierung des IR-Reflexionsspektrums der untersuchten Mehrschichtstruktur durch Einbeziehung der zusätzlichen Schicht in die Analyse ermöglichte es, die beste Anpassung des experimentellen Spektrums zu erhalten. Die erhaltenen Dicken der GaN-Schichten stimmen gut mit den SEM- und SIMS-Daten überein. Die aus der spektralen Abhängigkeit der dielektrischen Permittivität berechneten LOPC-Modi für jede GaN-Schicht zeigten eine Hochfrequenzverschiebung und eine Verbreiterung von LPP + mit steigender Trägerkonzentration verzweigen. Concentration and mobility of charge carrier for each GaN layer were calculated from the plasmon frequency and damping parameter. Obtained carrier concentration profile is similar to those obtained by SIMS, but with values of carrier concentration one order of magnitude less than the concentration of Si doping impurity, which can be attributed to compensation effects by the defect acceptor states. Thus, it is demonstrated that IR reflectance spectroscopy and 2 × 2 transfer matrix method can be successfully used for analysis of epitaxial multilayer GaN structures with non-uniform doping profiles, and allow for the determination of the fundamental electron and phonon parameters of each GaN layer.
Change history
Abkürzungen
- IR:
-
Infrarot
- FTIR:
-
Fourier transform infrared spectroscopy
- SEM:
-
Rasterelektronenmikroskopie
- SIMS:
-
Secondary ion mass spectrometry
- LOPC:
-
Longitudinal optical phonon– plasmon coupled
Nanomaterialien
- Struktur und elektronische Eigenschaften von übergangsmetalldotiertem Kaolinit-Nanoton
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Neue Nanokomposite aus Polystyrol mit mit Laurylschwefelsäure dotiertem Polyanilin
- Temperaturabhängigkeit der Bandlücke in MoSe2, das durch Molekularstrahlepitaxie gezüchtet wurde
- Amorphe Silizium-Nanodrähte, die durch Glühen auf Siliziumoxid-Film gewachsen sind
- Zielgerichtete Endothelzellen mit multifunktionalen GaN/Fe-Nanopartikeln
- Raman-Mapping-Analyse von Graphen-integrierten Silizium-Mikroring-Resonatoren
- Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs
- Strukturverschiebung von GaN zwischen Nanowall-Netzwerken, Nanosäulen und Compact Films Grown on Si (111) by MBE
- Verstehen des Wachstumsmechanismus von GaN-Epitaxieschichten auf mechanisch abgeblättertem Graphit



