Compliance-freier ZrO2/ZrO2 − x /ZrO2 Resistiver Speicher mit steuerbarem Grenzflächen-Mehrzustands-Schaltverhalten
Zusammenfassung
Eine steuerbare Transformation vom Grenzflächen- zum Fadenschaltmodus wird auf einem ZrO2 . präsentiert /ZrO2 − x /ZrO2 dreischichtiger resistiver Speicher. Die beiden Schaltmodi werden mit möglichen vorgeschlagenen Schalt- und Transformationsmechanismen untersucht. Widerstandsmodulation des ZrO2 − x Es wird vorgeschlagen, dass die Schicht für das Schalten in den Grenzflächenschaltmodus durch das Injizieren/Rückziehen von Sauerstoffionen verantwortlich ist. Durch den intrinsischen Serienwiderstand durch die im ZrO2 . gebildeten Filamente ist das Schalten nachgiebig Schichten. Durch Einstellen des RESET Spannungen, steuerbarer und stabiler Multistate-Speicher erreicht werden, was eindeutig auf die Fähigkeit hinweist, Multistate-Hochleistungsspeicher der nächsten Generation zu entwickeln.
Hintergrund
Die Entwicklung dichterer, schnellerer und weniger energieverbrauchender nichtflüchtiger Speicher ist von großer Bedeutung für Innovationen in der modernen Informationstechnologie [1, 2]. Während sich viele Konkurrenten als Speicherbausteine der nächsten Generation herausgestellt haben, ist der auf Metalloxiden basierende resistive Direktzugriffsspeicher (RRAM) einer der vielversprechendsten Kandidaten aufgrund seiner Vorteile wie hohe Geschwindigkeit, hohe Skalierbarkeit, geringer Stromverbrauch und gute Kompatibilität mit den CMOS-Prozess [3]. Obwohl der detaillierte Schaltmechanismus des resistiven Speichers ungewiss ist, wird allgemein akzeptiert, dass die Migration von Sauerstoffleerstellen unter einem angelegten elektrischen Feld eine Schlüsselrolle für das Schaltverhalten spielt [4]. Abhängig vom Schaltmechanismus kann das ohmsche Schalten in Filament- und Grenzflächen-(homogen)-Modi eingeteilt werden. Der Filamentmodus wird durch die Bildung und den Bruch von Filament(en) mit Sauerstoffleerstellen zwischen zwei Elektroden erreicht. Andererseits wird die Widerstandsumschaltung im Grenzflächenmodus durch die Verteilung von Sauerstoffleerstellen entlang einer Grenzfläche gesteuert. Der Strom ist im Filamentmodus in den leitenden Filamenten lokalisiert, während er sich im Grenzflächenmodus homogen über die Gerätefläche verteilt [5, 6]. Der in einem Speicherbauelement charakterisierte Widerstandsschaltmodus hängt stark von seiner Struktur ab. Im Allgemeinen beruht die Darstellung der Grenzflächenmode im Metalloxid-basierten System auf der Existenz eines Sauerstoffgradientenprofils entlang der vertikalen Achse [7, 8]. Kürzlich wurde auch über die Koexistenz beider Modi in einem Materialsystem berichtet [9,10,11]. Durch Modulation der Messparameter kann auch eine Transformation zwischen diesen beiden Modi erreicht werden [12]. Das Umschalten in den Grenzflächenmodus wird jedoch normalerweise auf die Änderung der Schottky-Barrierehöhe zurückgeführt, die durch die Akkumulations- und Verarmungsprozesse von Ladungsträgern durch defekte Zustände an der Grenzfläche Elektrode/Funktionsschicht induziert wird [7, 9,10,11,12,13, 14,15,16,17,18] und nicht der Effekt der Migration von Sauerstoff-Leerstellen an den Oxid/Oxid-Grenzflächen.
In den letzten Jahren wurden enorme Fortschritte gemacht, um die Speicherdichte von RRAM zu erhöhen. Abgesehen von den Bemühungen, die physikalischen Abmessungen von Speicherzellen zu verkleinern, ist es geworden, die Zwischenwiderstandszustände (IRS) zwischen dem hochohmigen Zustand (HRS) und dem niederohmigen Zustand (LRS) zu nutzen, um eine Mehrzustandsspeicherung innerhalb einer Speicherzelle zu realisieren eine beliebte Alternativlösung [19, 20]. Dieses Multistate-Speicherverhalten ist wichtig für High-Density-Speicher und oxidbasierte elektronische synaptische Bauelemente [21,22,23]. Die Multistate-Speicherung im filamentären Schaltmodus wird durch Steuerung der Breite und/oder Anzahl der leitenden Filamente mit unterschiedlichen RESET . realisiert Spannungen oder SET aktuellen Konformitäten. Eine Vielzahl von Metalloxiden, einschließlich TiOx , ZnO, SiOx und HfO2 , haben Multistate-Verhalten in RRAM-Bausteinen gezeigt [24,25,26,27]. Es wurde auch über eine Mehrzustandsspeicherung im Grenzflächenschaltmodus berichtet, bei der vorgeschlagen wurde, dass die Anpassung der Breite der Sauerstoffdefektbereiche für dieses Verhalten verantwortlich ist [12, 28]. Beide Schaltmodi erfordern jedoch eine Stromkompatibilität im SET Prozess, um das Gerät vor Durchschlägen zu schützen und im Falle des fadenförmigen Schaltens um mehrfach niedrigere Widerstandszustände zu erreichen. Diese Anforderungen könnten zu einer Komplexität beim Design von RRAM-Schaltungen führen. Compliance-freier resistiver Speicher mit steuerbarem Multistate-Schaltverhalten könnte daher von Vorteil sein, da er das Stromüberschwingen während des Schaltens minimiert und das Potenzial hat, die Herstellungskosten erheblich zu senken [29, 30].
Vor kurzem wurde die Verwendung von ZrO2 da die aktive Schaltschicht wegen ihrer hohen thermodynamischen Stabilität, einfachen Zusammensetzung und Halbleiterprozesskompatibilität aufgefallen ist [31,32,33]. Einfügen einer Alien-Schicht in das ZrO2 Film zur Erzeugung einer Oxidheterostruktur hat sich als wirksames Verfahren zur Verbesserung der Schalteigenschaften in ZrO2 . erwiesen -basierte Geräte [34, 35]. In dieser Arbeit demonstrieren wir ein ZrO2 /ZrO2 − x /ZrO2 -basierter resistiver Speicher, in dem ein unstöchiometrisches ZrO2 − x Schicht wird innerhalb des ZrO2 . gebildet Schicht durch Einfügen einer Zr-Schicht. Es werden sowohl Grenzflächen- als auch Filamentmoden beobachtet, und eine kontrollierbare Umwandlung von Grenzfläche zu Filament kann realisiert werden. Die Schalteigenschaften und die Leistung für beide Modi werden untersucht. Während die Oxid/Elektrode-Grenzfläche einen Einfluss auf das Schaltverhalten im Filamentmodus hat, beruhte das Schalten im Grenzflächenmodus stark auf den Oxid/Oxid-Grenzflächen in den Dreischichtstrukturen. Am wichtigsten ist, dass das resistive Schalten im Grenzflächenmodus eine eingebaute Compliance-freie Eigenschaft sowie ein Multistate-Speicherverhalten unter verschiedenen RESET . aufweist Spannungen.
Methoden
ZrO2 Dünnschichten wurden durch Plasma-unterstütztes Mittelfrequenz-Magnetron-Sputtern (Leybold Optics HELIOS Pro XL) bei Raumtemperatur hergestellt. Bei diesem Verfahren rotierte das Substrat mit einer Geschwindigkeit von 180 U/min, um eine gleichmäßige Abscheidung zu gewährleisten. Bei jeder Umdrehung wurde zunächst eine dünne Zr-Schicht von einem Zr-Metall-Target (99,99% Reinheit) mit einer Leistung von 2000 W in einer Ar-Atmosphäre abgeschieden. Dieser dünne Film wurde in eine Oxidschicht umgewandelt, indem das Substrat unter dem O2 . hindurchgeführt wurde Plasma der HF-Quelle. Die O2 Durchflussmenge kann eingestellt werden, um ZrOx . zu produzieren Filme mit unterschiedlichen Kompositionen. Die Zusammensetzungseigenschaften der abgeschiedenen Filme wurden unter Verwendung von energiedispersivem Röntgen (EDX) untersucht, wobei ein Zeiss EVO LS 25-Mikroskop verwendet wurde, das mit einem Oxford INCA x-act-Röntgendetektor ausgestattet war. Filme mit einer großen Dicke von 1 µm wurden direkt auf Si-Wafern abgeschieden, um den Einfluss des Substrats zu minimieren. Röntgenbeugungsmuster (XRD) wurden im streifenden Einfall (θ = 1°) mit einem Rigaku Smartlab Diffraktometer mit einem 9-kW Cu-Kα Quelle. Die Daten der Röntgenphotoelektronenspektroskopie (XPS) wurden unter Verwendung eines ThermoScientific Theta-Sondensystems mit Al-Kα . erhalten Strahlung (Photonenenergie = 1486,6 eV). Das XPS-Tiefenprofil wurde unter Verwendung einer Ar-Ionenkanone bei einer Strahlspannung von 3 kV auf einer Rasterfläche von 2 × 2 mm durchgeführt. Transmissionselektronenmikroskopie (TEM)-Proben wurden unter Verwendung von konventionellem mechanischem Polieren, gefolgt von Ionenfräsen bis zur Elektronentransparenz unter Verwendung von Ar+ bei 6 keV, hergestellt. Ein abschließender Niedrigenergie-Mahlschritt wurde bei 500 eV durchgeführt. Um Oberflächenschäden zu minimieren, wurden die Struktur und Morphologie der Proben mit einem JEOL 2100 TEM mit LaB6 . analysiert und JEOL ARM200F TEM/Scanning TEM (STEM) mit einer Schottky-Kanone, die beide bei 200 kV arbeiten. Annular Darkfield (ADF) STEM-Messungen wurden in ARM200F mit Sonden- und Bildfehlerkorrektur-CEOS-Korrektoren durchgeführt. ADF-STEM-Bilder wurden mit einem JEOL-Ringfelddetektor mit einem Sondenstrom von ungefähr 23 pA, einem Konvergenzhalbwinkel von ∼25 mrad und einem Innenwinkel von 45–50 mrad aufgenommen. Ein Oxford Instruments X-Max N Der fensterlose Silizium-Drift-Detektor (SSD) 100TLE wurde verwendet, um die STEM-EDX-Analyse durchzuführen.
Das Widerstandsschaltverhalten des dreischichtigen ZrO2 /ZrO2 − x /ZrO2 Film wurde als Erinnerung untersucht. Ein 200 nm dicker TiN-Film wurde reaktiv gesputtert (Ti-Target in einem N2 Atmosphäre) auf das SiO2 Schicht, um die untere Elektrode zu bilden. Es folgte das reaktive Sputtern eines zweiten SiO2 Schicht (Si-Target in einem O2 Atmosphäre). Diese Schicht aus SiO2 wurde durch Photolithographie und reaktives Ionenätzen strukturiert, um aktive Bauelementbereiche zu bilden. Anschließend wird ZrO2 /ZrO2 − x /ZrO2 (20 nm/5 nm/20 nm) Dreischichten wurden abgeschieden, um die Schaltschicht zu bilden. Die dreischichtige Struktur wurde durch Stoppen des Sauerstoffplasmas während des ZrO2 . erhalten Wachstum. ZrO2 Schicht wird unter einem O2 . erreicht Durchflussrate von 20 sccm während der ZrO2 − x Schicht erhält man durch Ausschalten des O2 20 s fließen lassen. Ein identisches ZrO2 /ZrO2 − x /ZrO2 Zur XRD- und XPS-Charakterisierung wurde auch eine Dreischicht auf einem Si-Substrat abgeschieden. Schließlich wurde eine 200-nm-TiN-Schicht gesputtert und auf der Dreifachschicht gemustert, um die obere Elektrode zu bilden. Alle elektrischen Messungen wurden mit einem Keithley 4200 Halbleiter-Charakterisierungssystem durchgeführt. Während der Messungen wurde die Programmierspannung Bias an die obere Elektrode angelegt, während die untere Elektrode geerdet blieb. Die Sonden-/Punktkontakte zu den oberen und unteren Elektroden der Geräte wurden durch ein Paar Wentworth-Sondennadeln unter Verwendung eines halbautomatischen Sondengeräts AVT 702 von Wentworth Laboratory realisiert. Die Spannungs-DC-Sweep-Messungen wurden mit einer konstanten Rate von 0,5 V/s durchgeführt.
Ergebnisse und Diskussion
Die Eigenschaften der Dreischichtstruktur wurden zunächst durch XRD untersucht. Abbildung 1 zeigt das XRD-Muster der abgeschiedenen Dreischichten (rot), das zwei Peaks aufweist, die bei 28,2 ° und 29,8 ° positioniert sind. Diese beiden Peaks können dem −111-Peak des monoklinen ZrO2 . zugeordnet werden Phase und der 101-Peak des tetragonalen ZrO2 Phase, die die Existenz von zwei Phasen anzeigt. EDX- und XRD-Charakterisierungen an einzelnen ZrO x Schichten mit unterschiedlicher Zusammensetzung (dargestellt in Zusatzdatei 1:Abbildung S1 und S2) zeigen, dass das stöchiometrische ZrO2 zeigt die monokline Phase (blau) an, während die tetragonale Phase (grün) aus dem sauerstoffarmen ZrO2 − x . nachgewiesen wurde Schicht. In dem dreischichtigen XRD-Muster wurden keine XRD-Peaks von metallischem Zr (rosa) beobachtet. Dies deutet auf die Koexistenz beider stöchiometrischer ZrO2 und sauerstoffarmes ZrO2 − x Schicht in der Dreischichtstruktur und die eingebettete Zr-Schicht wurde oxidiert.
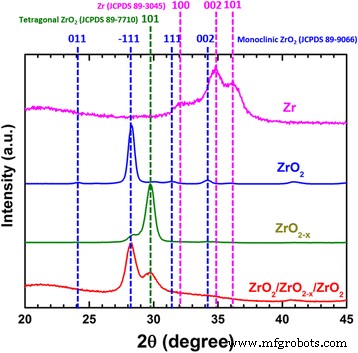
XRD-Muster des abgeschiedenen ZrO2 /ZrO2 − x /ZrO2 dreilagige Struktur (rot ), sauerstoffarmes ZrO2-x Schicht (grün ), stöchiometrisches ZrO2 Schicht (blau ) und rein metallische Zr-Schicht (pink )
Abbildung 2a, b zeigen die XPS-Ergebnisse von Zr 3d- und O 1s-Peakprofilen über eine Ätzzeit von 800 s. Zwei Gipfel bei ca. 182,3 und 184,5 eV können dem vollständig oxidierten Zr 4+ . zugeschrieben werden Zustand [36, 37], die die Zr-Spektren bis zu einer Ätzzeit von ca. 300 s. Eine deutlich verstärkte Intensität von zwei Peaks bei ca. Zwischen der Ätzzeit von 300 bis 400 s können anschließend 178,3 und 180,5 eV beobachtet werden; dies geht auch mit der Reduzierung von O 2− . einher Spitzenintensität bei ca. 530,0 eV. Es wurde vermutet, dass diese beiden Zr-3d-Peaks mit dem metallischen oder nicht oxidierten Zr 0 . assoziiert sind Zustand [36]. Dies zeigt das sauerstoffarme ZrO2 − x . an Schicht liegt in der Mitte dieser dreischichtigen Struktur. Nach 400 s Ätzzeit ist das Zr 4+ Peaks nehmen ihre Dominanz wieder auf und die Intensität des O 2− Peak ist wieder normal. Die Atomkonzentration entlang des Tiefenprofils in Abb. 2c bestätigt weiter die Oxidation der eingebetteten Zr-Schicht zu nichtstöchiometrischem ZrO2 − x . Es ist auch erwähnenswert, dass Zusammensetzungsgradienten zwischen ZrO2 und ZrO2 − x Es wurden auch Grenzflächen beobachtet, was die Bildung von Grenzflächenschaltverhalten erleichtert [8]. Unter Berücksichtigung der XRD- und XPS-Ergebnisse ist es vernünftig anzunehmen, dass die im XRD nachgewiesene monokline Phase von den beiden stöchiometrischen ZrO2 . stammt Schichten. Das zwischengelagerte sauerstoffarme ZrO2 − x Andererseits trägt die Schicht zur tetragonalen Phase bei, obwohl einige Spuren amorpher Bereiche nicht ausgeschlossen werden können.
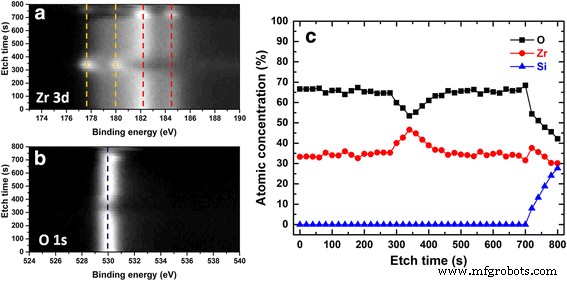
XPS-Spektren von a Zr 3d und b O 1s für ZrO2 /ZrO2 − x /ZrO2 Dreischichtstruktur über eine Ätzzeit von 700 s. c XPS-Tiefenprofil des ZrO2 /ZrO2 − x /ZrO2 dreischichtiger Aufbau
TEM-Messung bestätigt weiterhin die Dreischichtstruktur mit dem sauerstoffarmen ZrO2 − x Schicht deutlich beobachtet, wie in Fig. 3a gezeigt. Darüber hinaus ist eine weitere Grenzschicht zwischen dem ZrO2 Schicht und untere TiN-Elektrode ist ebenfalls sichtbar. Das entsprechende EDX-Profil ist in Abb. 3b dargestellt, in dem die Interdiffusion von Ti-, O-, N- und Zr-Atomen in den ersten 10 nm sichtbar ist. Darüber hinaus bestätigt das viel höhere O:Zr-Verhältnis (offenes Quadrat) in den ersten 5 nm die Existenz eines TiO x N y Grenzschicht zwischen dem ZrO2 und die untere TiN-Elektrode. In der Tat, da ZrO2 wird unmittelbar nach TiN gesputtert, das O2 Plasma reagiert mit der TiN-Oberfläche zu einem TiO x N y Schicht, wenn das ZrO2 Schicht ist noch sehr dünn. Ähnliche Bildung von Grenzflächen-TiO x N y Schicht wurde auch berichtet [38, 39].
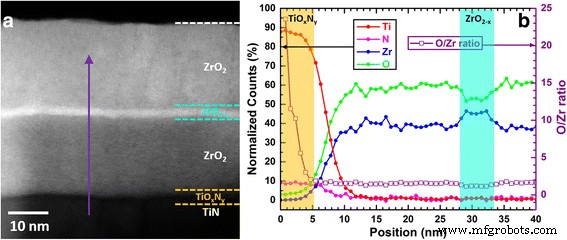
a ADF-STEM-Bild des Querschnitts der Probe und b STEM-EDX-Elementarlinienprofile des TiN/ZrO2 /ZrO2 − x /ZrO2 Struktur
Basierend auf den Charakterisierungsergebnissen ist das Schema des ZrO2 /ZrO2 − x /ZrO2 Dreischichtspeicher ist in Fig. 4a dargestellt. Es wird gemessen, dass sich die makellose Vorrichtung im hochohmigen Zustand befindet, wie in Fig. 4b gezeigt. Eine große negative Formungsspannung (I CC = 1 mA) ist erforderlich, um den weichen dielektrischen Durchbruch zu induzieren und das Schalten einzuleiten. Ganz ungewöhnlich ist dies mit einem zweistufigen Formgebungsprozess verbunden, der die aufeinanderfolgende Bildung von zwei Filamenten in den beiden ZrO2 . nahelegt Ebenen und das Gerät ist SET in einen niederohmigen Zustand. An RESET . wurde dann eine positive Spannung angelegt das Gerät in das HRS ein, wie in Abb. 4c gezeigt. Auffällig ist, dass dieses RESET Der Prozess zeichnet sich durch eine allmählich kontinuierliche Abnahme des Stroms aus, ein typisches Merkmal für das ohmsche Schalten an der Grenzfläche. Das SET Prozess durch Anlegen einer negativen Vorspannung zeigt ebenfalls ein ähnliches Verhalten, was darauf hindeutet, dass das ohmsche Schalten an der Grenzfläche der dominante Schaltmodus ist. Das Grenzflächenschaltverhalten wird weiter durch die Flächenabhängigkeit des Stroms sowohl in HRS als auch in LRS belegt (dargestellt in Abb. 4d). Beide Ströme nehmen mit zunehmender Elektrodengröße zu, was darauf hinweist, dass die Stromleitung nicht fadenförmig ist. Die Stromzunahme ist jedoch nicht vollständig proportional zur Fläche. Dies könnte durch die weniger effektive Modulation des spezifischen Widerstands bei größeren Zellgrößen während des Grenzflächenschaltens aufgrund der größeren Menge an Korngrenzen und Leckströmen erklärt werden [12]. Ein ähnliches Verhalten wurde auch von anderen ohmschen Zweischicht-Grenzflächen-Schaltvorrichtungen berichtet [8, 12]. Das SET Prozess zeigt ein selbstkonformes Verhalten. Dies ist für die Anwendung in resistiven Speichern von Vorteil, da es das Stromüberschwingen während des Schaltens minimiert und das Potenzial hat, die Herstellungskosten erheblich zu senken [29, 30].
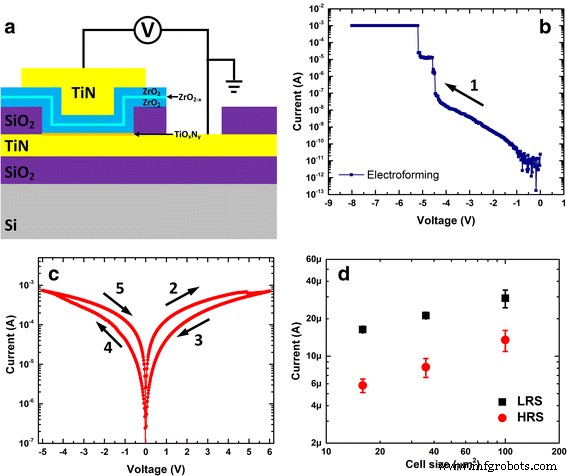
a Schema der dreischichtigen TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-Speicher. b I–V Eigenschaften des Galvanoformungsprozesses für das TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-Gerät. c I–V Eigenschaften der Grenzflächenumschaltung nach der Umformung. d Strom als Funktion der Gerätegröße für beide HRS/LRS im Grenzflächenschaltmodus
Die Umwandlung vom Grenzflächenschaltmodus in den Fadenschaltmodus kann durch einen zweiten Formungsschritt ausgelöst werden, wie in Fig. 5a gezeigt. An das Gerät wurde bei HRS eine negativere Vorspannung mit einer Stromcompliance von 20 mA angelegt. Dies führt zu einem abrupten Stromanstieg bei ca. –8 V, und das Gerät verbleibt anschließend in einem viel niedrigeren Widerstandszustand. Nach dem RESET Prozess mit positiver Vorspannung wurde der Schaltmodus des Geräts vollständig in den filamentären Modus umgewandelt, gekennzeichnet durch das scharfe SET (Stromkontrolle) und RESET Übergänge. Abbildung 5b zeigt die kumulative Wahrscheinlichkeitsverteilung der LRSs und HRSs sowohl des Grenzflächen- als auch des fadenförmigen Schaltmodus, bei dem deutliche Unterschiede zwischen diesen beiden Sätzen von Widerstandszuständen beobachtet werden können, was darauf hinweist, dass das Gerät in verschiedene Modi geschaltet wurde. Um den Leitungsmechanismus beider Schaltmodi zu beleuchten, wird der logarithmische I–V Kurvendiagramme und lineare Anpassungen des SET Prozesse werden vorgestellt. Die I–V Kurve bei HRS im Grenzflächenmodus folgt einem ohmschen Verhalten bei niedriger Spannung mit dem Hinzufügen eines quadratischen Termes bei höherer Spannung, d. h. I ∝ aV + bV 2 , welches das typische Merkmal des Raumladungs-Limited-Current-(SCLC)-Modells ist, wie in Abb. 5c gezeigt [40,41,42]. Ähnliche Beobachtungen dieses SCLC-Mechanismus wurden auch bei anderen grenzflächenresistiven Speicherbauelementen berichtet [8, 12]. Andererseits ist das logarithmische I–V Kurven des SET Prozess beim filamentären Schalten nach der Transformation ist in Fig. 5d gezeigt. Die Kurve legt nahe, dass der Strom durch das SCLC-Modell mit Fallen bestimmt wird [40,41,42]. Obwohl ein ähnliches Leitungsmodell verwendet wird, um die Grenzflächen- und Filamentumschaltung zu erklären, zeigen die beiden Moden immer noch unterschiedliche Eigenschaften, insbesondere bei einem niederohmigen Zustand. Die Stromleitung für LRS im Filamentmodus besteht aus zwei Bereichen:dem Ohmschen Bereich (I ∝ V ) und die Kinderrechtsregion (I ∝ V 2 ), wohingegen letzteres bei der LRS-Leitung des Grenzflächenwechsels nicht beobachtet wurde. Dies deutet darauf hin, dass das filamentäre Schalten durch einen Träger-Trapping/Detrapping-Prozess vermittelt wird [43]. Wir vermuten, dass während des zweiten Bildungsprozesses eine beträchtliche Anzahl von Fallen in den leitfähigen Pfaden erzeugt wird, was zu dem quadratischen Stromterm im LRS des Filamentmodus führt.

a Ich –V Merkmale des Transformationsprozesses (orange ) von der Grenzflächenschaltung (rot ) zum Fadenschalter (blau ). b Kumulatives Wahrscheinlichkeitsdiagramm von HRS und LRS für beide Grenzflächen (V RESET = 6 V) und filamentäre Schaltmodi. Das SET Prozess I–V Kurven der c Grenzfläche und d filamentäre Schaltmodi in doppellogarithmischer Darstellung
Einschichtiges ZrO2 Zum Vergleich mit dem in Fig. 6a gezeigten Schema wurde auch ein Speicher mit einer Filmdicke von 40 nm hergestellt. Der Galvanoformprozess (I CC = 1 mA) des TiN/ZrO2 /TiN-Gerät verfügt über einen einzelnen Schritt mit viel höherer Spannung (Abb. 6b). Anschließend wurde ein bipolares Schaltverhalten beobachtet (Abb. 6c), das dem Filamentmodus in der Dreischichtvorrichtung ähnlich ist. Der Grenzflächenschaltmodus wurde jedoch bei dieser einschichtigen Vorrichtung nicht beobachtet. Abbildung 6d zeigt das logarithmische I–V Kurven des SET Prozesse für einschichtige Bauelemente, die gute Übereinstimmungen mit dem SCLC-Modell mit Fallen zeigen. Dies unterstützt auch die Schlussfolgerung, dass das sandwichartige ZrO2 − x Schicht ist entscheidend für die Grenzflächenumschaltung, die entweder am ZrO2 − x . stattfindet Schicht oder in der Nähe des ZrO2 − x /ZrO2 Schnittstelle.
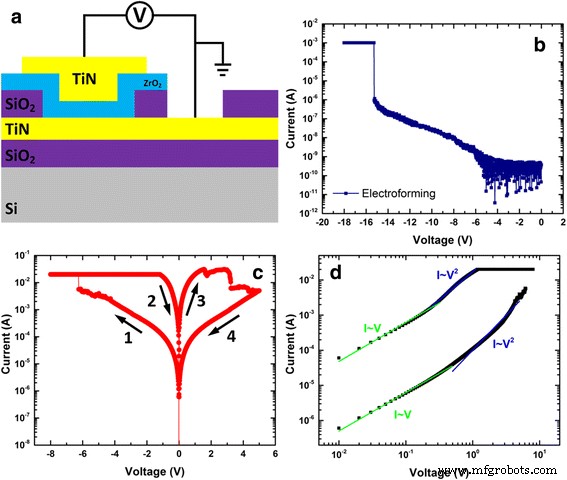
a Schema der einlagigen TiN/ZrO2 /TiN-Gerät. b I–V Eigenschaften des Galvanoformungsprozesses für das TiN/ZrO2 /TiN-Gerät. c I–V Eigenschaften des TiN/ZrO2 /TiN-Gerät nach dem Formen. d I–V Kurven des SET Prozess in doppellogarithmischer Darstellung mit linearer Anpassung
Basierend auf den Charakterisierungsergebnissen wird ein detaillierter Mechanismus der beiden Schaltmodi und der Transformation vorgeschlagen, wie in Abb. 7 gezeigt. Durch Anlegen einer negativen Formierspannung werden die Sauerstoffionen nach unten in Richtung der unteren Elektrode gedrückt, während die Sauerstoffleerstellen nach oben wandern Elektrode und bilden einen leitfähigen Faden. Die Grenzfläche TiO x N y Schicht spielt eine entscheidende Rolle für das bipolare Verhalten, da sie als Sauerstoffreservoir dient [38, 44]. Im unteren und oberen ZrO2 . werden nacheinander zwei schwache Filamente erzeugt Schichten, gekennzeichnet durch den zweistufigen Umformprozess (Abb. 7b, c). Obwohl einige Sauerstoffionen in das mittlere ZrO2 − x . injiziert worden sein könnten Schicht ist das Niveau der Sauerstoffleerstellen immer noch hoch genug, um die Schicht in einem Zustand mit niedrigem Widerstand zu halten. Das Gerät hat daher auf das LRS umgeschaltet (Abb. 7c). Wenn eine positive Vorspannung angelegt wird, werden Sauerstoffionen vom TiO x . angezogen N y Schicht zum ZrO2 − x Schicht, was zur Bildung einer sauerstoffreichen Schicht führt. Diese stöchiometrische Modulation des ZrO2 − x Schicht ändert Gedächtnis in HRS (Abb. 7d). Eine weitere negative Voreingenommenheit ist erforderlich, um SET das Gerät in LRS, indem die Sauerstoffionen von der mittleren Schicht zurück zum TiO x . gedrückt werden N y Vorratsbehälter (Abb. 7e). Die nachgiebige Eigenschaft des Geräts kann von der geringen Leitfähigkeit der beiden Filamente herrühren, die effektiv als intrinsische Reihenwiderstände dienen. Die Transformation findet statt, wenn eine signifikant große Vorspannung angelegt wird, die die Bildung eines viel stärkeren und leitfähigen Filaments durch die gesamte dreischichtige Struktur induziert (Fig. 7f). Der Widerstand des Gerätes hängt nicht mehr vom ZrO2 − x . ab Schicht, und der Schaltmodus wird von Grenzfläche zu filamentär umgewandelt. Das Gerät kann dann EIN- und AUS geschaltet werden mit positiver bzw. negativer Vorspannung (Abb. 7g, h).
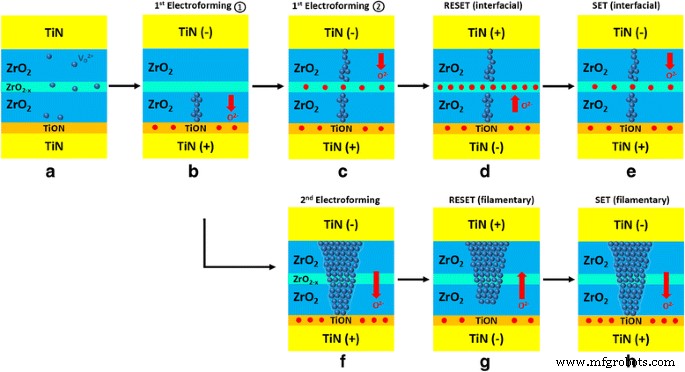
Schema des Schaltmechanismus auf der Tri-Layer-TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-Gerät für den Grenzflächenwechselmodus (a –e ). Die Transformation vom Grenzflächenmodus zum Filamentmodus (f ) und den Filamentmodus (g , h )
Der Grenzflächenschaltmodus in dieser Arbeit bietet das Potenzial für Mehrzustandsspeicher. Da der Gerätewiderstand im Grenzflächenmodus durch den Gehalt an Sauerstoffionen im ZrO2 − x . vermittelt wird Schicht können mehrere Widerstandszustände erreicht werden, indem die Menge an Sauerstoffionen in der mittleren Schicht mit verschiedenen RESET . gesteuert wird Spannungen. Abbildung 8a zeigt die I–V Geräteeigenschaften mit RESET Spannungen von 5.0, 5.5 und 6.0 V mit konstantem SET Spannung von –5 V. Es ist erwähnenswert, dass diese Parameter mit der Schichtdicke skalierbar sind, da die Migration von Sauerstoffleerstellen durch das elektrische Feld getrieben wird. Mit einer dicken Funktionsschicht von etwa 50 nm hat diese vorgestellte Arbeit noch ein gutes Potenzial zur Verkleinerung und signifikanten Reduzierung des SET und RESET Spannungen. Abbildung 8b zeigt die Zykleneigenschaften dieser Multistate-Speicheroperation, bei der die reversible und reproduzierbare Widerstandsschalteigenschaft für ca. 100 Zyklen, was auf ein vielversprechendes Ausdauerverhalten dieses Geräts hinweist.
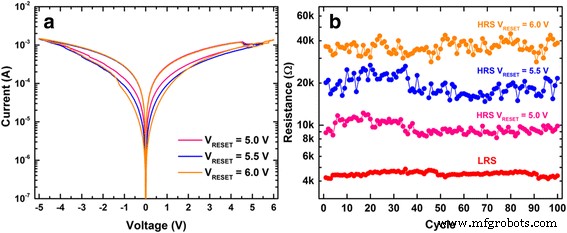
a I–V Eigenschaften der Grenzflächenumschaltung für das dreilagige TiN/ZrO2 /ZrO2 − x /ZrO2 /TiN-Gerät mit unterschiedlichem RESET Spannungen. b Dauertest von 100 Zyklen für die Grenzflächenumschaltung mit verschiedenen RESET Spannungen
Schlussfolgerungen
In einem ZrO2 . wurde eine kontrollierbare Umwandlung vom Grenzflächenmodus in den fadenförmigen Grenzflächenmodus beobachtet /ZrO2 − x /ZrO2 dreischichtiger Speicher. Der mögliche Schalt- und Transformationsmechanismus wird vorgeschlagen. Das eingebettete ZrO2 − x Es wird angenommen, dass die Schicht eine entscheidende Schicht für den Grenzflächenschaltmodus ist. Dieser Modus weist ein nachgiebiges Verhalten auf, möglicherweise aufgrund des intrinsischen Reihenwiderstands durch die zwei dünnen Filamente, die im ZrO2 . gebildet sind Schichten. Durch Steuerung des RESET Spannungen können Mehrzustandswiderstände bei HRS erreicht werden. Dieses Multistate-Speicherverhalten weist eindeutig auf die Fähigkeit hin, den Multistate-Hochleistungsspeicher der nächsten Generation zu entwickeln.
Abkürzungen
- ADF-STEM:
-
Annulare Dunkelfeld-Rastertransmissionselektronenmikroskopie
- EDX:
-
Energiedispersive Röntgenspektroskopie
- HRS:
-
Hochohmiger Zustand
- IRS:
-
Zwischenwiderstandszustand
- LRS:
-
Niederohmiger Zustand
- RRAM:
-
Resistiver Arbeitsspeicher
- SCLC:
-
Raumladungsbegrenzter Strom
- XPS:
-
Röntgenphotoelektronenspektroskopie
- XRD:
-
Röntgenbeugung
Nanomaterialien
- Ein RRAM-integrierter 4T SRAM mit selbsthemmender ohmscher Schaltlast durch reinen CMOS-Logikprozess
- Eine gemeinsame Studie zur Modellierung und Simulation von resistivem Direktzugriffsspeicher
- Polarisationskonverter mit steuerbarer Doppelbrechung basierend auf einer hybriden volldielektrischen Graphen-Metaoberfläche
- Ferroelektrischer Feldeffekt induzierter asymmetrischer ohmscher Schalteffekt in epitaktischen BaTiO3/Nb:SrTiO3-Heteroübergängen
- Eine Studie zur Variabilität des kontaktresistiven Direktzugriffsspeichers nach dem stochastischen Vakanzmodell
- Herstellung optischer Schaltmuster mit strukturellen farbigen Mikrofasern
- Doppelfunktionen von V/SiOx/AlOy/p++Si-Gerät als Selektor und Speicher
- Untersuchung des Energiebandes an den Molybdändisulfid- und ZrO2-Heterojunctions
- Dielektrische Verstärkung von atomschichtbeschichteten Al2O3/ZrO2/Al2O3-MIM-Kondensatoren durch Mikrowellenglühen
- Ge-pMOSFETs mit hoher Mobilität und ZrO2-Dielektrikum:Auswirkungen des Nachglühens



