Erkennen von räumlich lokalisiertem Exziton in selbstorganisierten InAs/InGaAs-Quantenpunkt-Übergittern:ein Weg zur Verbesserung der Photovoltaik-Effizienz
Zusammenfassung
Dieser Artikel berichtet über experimentelle und theoretische Untersuchungen atypischer temperaturabhängiger Photolumineszenzeigenschaften von mehrfach gestapelten InAs-Quantenpunkten in unmittelbarer Nähe zu einer darunter liegenden InGaAs-Zugentlastung. Die InAs/InGaAs/GaAs-QD-Heterostruktur wurde durch Festkörper-Molekularstrahlepitaxie (SS-MBE) gezüchtet und mittels Photolumineszenz (PL), spektroskopischer Ellipsometrie (SE) und zeitaufgelöster Photolumineszenz im Pikosekundenbereich untersucht. In den PL-Spektren der Probe werden deutliche Doppelemissionspeaks beobachtet. Aus den anregungsleistungsabhängigen und temperaturabhängigen PL-Messungen werden diese Emissionspeaks mit dem Grundzustandsübergang von InAs-QDs mit zwei unterschiedlich großen Populationen in Verbindung gebracht. Lumineszenzmessungen wurden als Funktion der Temperatur im Bereich von 10–300 K nach der PL-Technik durchgeführt. Der Niedertemperatur-PL hat eine abnorme Emission gezeigt, die auf der Niedrigenergieseite auftrat und der Rekombination durch die tiefen Niveaus zugeschrieben wird. Die PL-Spitzenenergie zeigt ein anomales Verhalten als Ergebnis des Konkurrenzprozesses zwischen lokalisierten und delokalisierten Trägern. Wir schlagen das Ensemblemodell des lokalisierten Zustands vor, um das übliche Photolumineszenzverhalten zu erklären. Die quantitative Studie zeigt, dass die Quantentopf-Kontinuumszustände als Transitkanal für die Umverteilung thermisch aktivierter Ladungsträger wirken. Wir haben die Lokalisierungstiefe und deren Einfluss auf die Anwendung der untersuchten Heterostruktur für Photovoltaikzellen bestimmt. Das Modell gibt einen Überblick über eine mögliche Verbesserung der InAs/InGaAs/GaAs QDs SCs Eigenschaften basierend auf den theoretischen Berechnungen.
Hintergrund
Selbstorganisierte Quantenpunkte (QDs) wurden aufgrund der Natur der dreidimensionalen Trägerbeschränkung und der δ-ähnlichen Zustandsdichte umfassend auf mögliche Anwendungen in der Optoelektronik untersucht. Kürzlich wurden QD-Strukturen vorgeschlagen, um Intermediate-Band-Solarzellen (IBSCs) zu realisieren, die durch die Valenz-IB- und IB-Leitungsband-Absorptionen zusätzliche Phototräger einführen [1]. Die GaAs-basierten IBSCs mit QDs, die eine kleinere Energiebandlücke als GaAs haben, bilden Tandemstrukturen, die Photonen bei Energien unter der GaAs-Energielücke absorbieren können, was zu höheren Energieumwandlungseffizienzen führt [2]. Die Bildung des QD-Zwischenbandes erfordert eine dicht gepackte Mehrschichtstruktur aus hochdichten QDs [3, 4]. Die Kristallqualität von InAs-QDs verschlechtert sich jedoch, wenn die QD-Schichtzahl zunimmt und der Schichtabstand aufgrund des Aufbaus einer inneren Druckspannung abnimmt. Die übermäßige Belastung führt zu Versetzungen und Defekten, die sich von den QDs zur Oberfläche aufschrauben. Daher verschlechtert sich auch die Leistung eines InAs/GaAs-QD-SC mit zunehmender Anzahl von QD-Schichten [5]. Um diese Probleme zu überwinden, wurde eine Dehnungskompensations-Wachstumstechnik mit GaAsN-, GaAsP- und GaP-Pufferschichten für InAs/GaAs-Materialsysteme demonstriert [6,7,8]. Eine andere Technik zur Überwindung dieser Probleme besteht darin, die InAs/GaAs-QDs-Schicht mit einer dünnen spannungsreduzierten InGaAs-Schicht zu bedecken. Im Vergleich zu InAs/GaAs-QDs verursacht diese Schicht aufgrund des Vorhandenseins einer kleinen Gitterfehlanpassung zwischen InAs und InGaAs eine Rotverschiebung der Photoantwort. Die temperaturabhängige Photolumineszenzstudie liefert nützliche Informationen über die Multi-Stacked InAs/GaAs QDs SC, die von erheblichem praktischem und theoretischem Interesse sind. Klassisch nimmt die Bandlücke eines Halbleitermaterials mit steigender Temperatur monoton ab. Spezielle Materialien wie InAs/GaAs-QDs haben aufgrund thermisch aktivierter Ladungsträgertransfermechanismen innerhalb des Ensembles der Quantenpunkte eine Anomalie in der PL bei tiefen Temperaturen gezeigt. Jedoch verschwinden diese Anomalien nach und nach nach Vermischungsprozessen nach dem Wachstum in den InAs/InGaAs/GaAs-QD-Heterostrukturen, wie von Ilahi et al. [9]. Heterostrukturen, die denen der vorliegenden Studie ähnlich sind, wurden von Sayari et al. auf ihre Effizienz in Photovoltaikanwendungen untersucht. [10]. In den letzten Jahrzehnten wurden viele Modelle vorgeschlagen, wie das von Passler, Vina und Varshni. Um zuverlässige Bauelemente herzustellen, muss das Temperaturverhalten derartiger InAs/InGaAs/GaAs-QD-Heterostrukturen gut verstanden werden, und zwar unter Verwendung des am besten passenden Modells. Dabei verwenden wir das um den thermischen Umverteilungskoeffizienten korrigierte klassische Passler-Modell, um die beobachtete S-förmige Temperaturabhängigkeit der exzitonischen Bandlücke besser zu verstehen. Unsere Studie ergibt ein in sich konsistentes, präzises Bild für die Ladungsträgerlokalisierung und -übertragung in einer InAs/InGaAs/GaAs-QD-Heterostruktur, die ein technologisch äußerst wichtiges Energiematerial für die Herstellung hocheffizienter Photovoltaik-Bauelemente ist.
Experimentelle Details
Abbildung 1 zeigt ein schematisches Diagramm der InAs/InGaAs/GaAs-QD-Heterostruktur, die in unserer Studie untersucht wurde. Die Heterostruktur besteht aus fünf Stapeln von InAs/In0.11 Ga0,89 As/GaAs-QD-Schichten, die von einer intrinsischen 80-nm-GaAs-Schicht eingeschlossen sind. Die Epitaxieschichten wurden auf epiready n + . aufgewachsen -GaAs (100)-Substrat unter Verwendung von Festquellen-Molekularstrahlepitaxie (SS-MBE) mit Riber MBE 32P-System. Nach der Oxiddesorption wird ein 250-nm-n + -dotierter GaAs-Puffer mit einer Dotierungsdichte von 2 × 10 18 cm −3 wurde bei 520 °C aufgewachsen, gefolgt von einer 1000-nm-n-dotierten GaAs-Basisschicht mit einer Dotierungsdichte von 10 17 cm −3 . Die Substrattemperatur wird dann gesenkt und bei 500 °C stabilisiert, um die intrinsische Region abzuscheiden. Wie in Abb. 1 gezeigt, bestehen die wiederholten Schichten aus 2,5 Monoschichten (ML) mit InAs-Bedeckung, 5 nm dickem In0,11 Ga0,89 As und 33 nm dickes GaAs. Die Bildung der QDs wurde in situ durch Überwachung des Beugungsmusters hochenergetischer Elektronen (RHEED) kontrolliert. Der Zweck des 5 nm dicken In0.11 Ga0,89 As soll die Emissions- und Absorptionsspektren rotverschieben, während das 33 nm dicke GaAs als Abstandsschicht fungiert. Die Wachstumsraten für InAs, In0,11 Ga0,89 As- und GaAs-Schichten betrugen 0,08 ML/s, 0,78 ML/s bzw. 0,7 ML/s, gemessen durch RHEED-Spiegelpunktoszillationen. Am Ende wird eine 500-nm-p-dotierte GaAs-Emitterschicht (2 × 10 17 cm −3 ) gefolgt von einem 100-nm-GaAs p + -dotierte Kontaktschicht (5 × 10 18 cm −3 ) wurden auf der Heterostruktur aufgewachsen. Als n- bzw. p-Dotierstoffe wurden Silizium (Si) und Beryllium (Be) verwendet. Während des Wachstums wurde die Temperatur mit einem Pyrometer kalibriert.
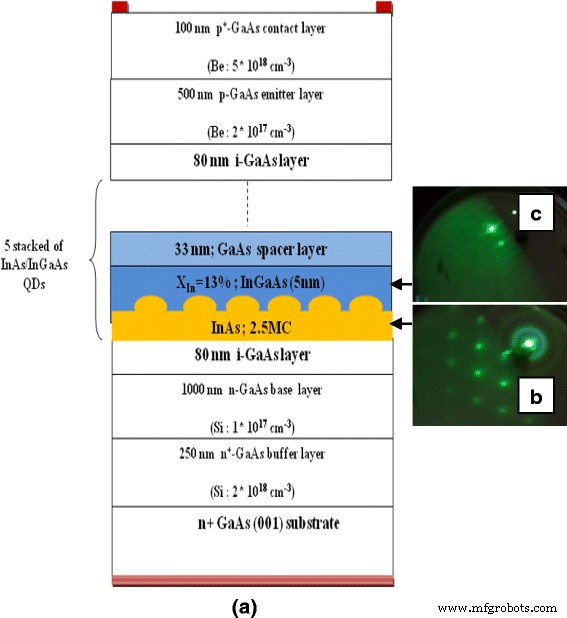
a Schematischer Schichtaufbau der fünfschichtigen gestapelten InAs/InGaAs-QDs SC aufgewachsen auf (001) n + -GaAs-Substrat. b RHEED-Muster nach Wachstum von 2,5 ml InAs (dreidimensionales Wachstum). c RHEED-Muster während des Wachstums von 5 nm InGaAs (zweidimensionales Wachstum) [10]
Die spektroskopische Ellipsometrie (SE) wurde bei Raumtemperatur zwischen 1 und 6 eV unter Verwendung eines J.A. Woollam spektroskopisches Ellipsometer mit variablem Winkel (VASE) M-2000. Die SE-Messungen wurden bei Einfallswinkeln von 45° bis 60° durchgeführt. Bei PL-Messungen wird ein Argon-Ion (Ar + ) wurde ein Laser mit einer Wellenlänge von 514,5 nm als Anregungsquelle verwendet, um Elektron-Loch-Paare zu erzeugen. Das Lumineszenzlicht der Proben wurde von einem hochauflösenden Spektrometer zerstreut und von einem thermoelektrisch gekühlten Ge-Photodetektor mit eingebautem Verstärker detektiert. Für die anregungsleistungsabhängigen und temperaturabhängigen PL-Messungen wurden die Proben in einem geschlossenen temperaturgeregelten Heliumkryostaten montiert. Die PL-Spektren wurden im nominellen Ausgangsleistungsbereich von 1,5–350 mW und dem Temperaturbereich von 11–300 K aufgenommen. Die zeitaufgelösten PL-Messungen wurden in einem temperaturvariablen (10–240 K), geschlossenen Helium Kryostat. Die 514 nm-Linie wurde als Anregungswellenlänge von einem modengekoppelten Ti:Saphir-Pikosekunden-Pulslaser mit einer Wiederholungsrate von 80 MHz und einer Pulsbreite von 1,2 ps verwendet.
Ergebnisse und Diskussionen
Abbildung 2 zeigt die gemessenen Real- (a) und Imaginärteile (b) der dielektrischen Funktion der InAs/InGaAs/GaAs-QD-Heterostruktur bei 300 K für den Energiebereich 1–6 eV. Real- und Imaginärteil folgen unterschiedlichen Mustern. Die Variation der dielektrischen Funktion mit der Photonenenergie weist darauf hin, dass einige Wechselwirkungen zwischen Photonen und Elektronen in den Filmen im Energiebereich von 1–6 eV erzeugt werden. Die beiden wichtigsten spektralen Merkmale sind die E1 und E2 Critical Point (CP)-Strukturen bei ~3 bzw. ~4,5 eV [11, 12]. Um die Energieposition der verschiedenen Interband-Übergänge quantitativ zu bestimmen, haben wir den Nulldurchgang des zweiten Ableitungsspektrums des Imaginärteils der pseudodielektrischen Funktion genommen. Die verschiedenen erhaltenen Übergangsenergien sind in Tabelle 1 zusammengefasst.
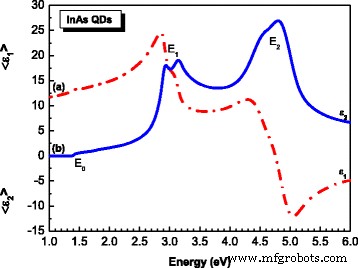
Echt (ϵ 1 ) (gestrichelte rote Linie ) und imaginär (ϵ 2 ) (durchgezogene blaue Linie ) Teile der dielektrischen Funktionen der InAs/InGaAs QD-Heterostruktur aus SE-Messungen erhalten [10]
Abbildung 3 zeigt das zweite Energieableitungsspektrum des imaginären Teils der in Abbildung 2 gezeigten pseudodielektrischen Funktion. Die beiden Peaks bei 2,9 und 3,1 eV entsprechen jeweils dem E 1 und E 1 + Δ1 , Zwischenbandübergänge in GaAs. Die beiden eng beieinander liegenden Peaks bei etwa 4,4 und 4,7 eV werden jedoch durch die CP-Übergänge E . verursacht 0 ’ und E 2 , bzw. in InAs-QD-Schichten [12]. Wir stellen fest, dass der Beitrag des E 1 + Δ1 CP-Energie (2,74 eV) [12] von InAs zum E 1 ein (2,91 eV) [11] von GaAs kann aufgrund der geringen Differenz zwischen den beiden Energiewerten nicht ausgeschlossen werden. Bei niedriger Energie ist die Bandlücke von GaAs im ε . deutlich unterscheidbar Spektrum bei etwa 1,4 eV. Auch das zweite Energieableitungsspektrum (Abb. 3) zeigt einen Interband-Übergang bei 1,75 eV, der dem E . entspricht 0 + Δ0 CP-Energie von GaAs [11]. Es ist bekannt, dass ε 2 ist ein Maß für die Materialqualität; der höchste Wert impliziert die abrupteste Schnittstelle [13]. Laut Literatur ε 2 Werte von etwa 25, wobei der höchste Wert in unserem Fall 26,8 beträgt, erhalten im Bereich des E 2 Bandlücke nahe 4,7 eV, weisen auf die hohe Qualität der Materialien hin, die die durch SS-MBE gezüchtete InAs/InGaAs/GaAs-QD-Heterostruktur bilden.
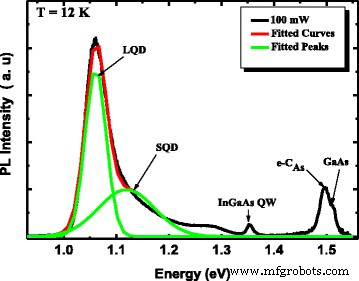
Zweites Ableitungsspektrum des Imaginärteils (ϵ 2 ) der dielektrischen Funktion als Funktion der Photonenenergie für die InAs/InGaAs-QD-Heterostruktur. Die Übergangsenergien, die sich aus InAs-QD-Schichten und GaAs-Schichten ergeben, sind angegeben [10]
Abbildung 4 zeigt das PL-Spektrum der aktiven Region in der InAs/InGaAs/GaAs-QD-Heterostruktur mit einer Anregungsleistung von 100 mW bei niedriger Temperatur (12 K). Offensichtlich weist das Spektrum eine asymmetrische Form auf, die sich auf der hochenergetischen Seite befindet und die durch Gauß-Anpassung in zwei Teilbänder entfaltet werden kann [14]. In Anbetracht der Abhängigkeit der Quanteneinschlusspotentiale von der Punktgröße wird der intensivste Peak bei 1,06 eV der Emission aus den Grundzuständen größerer QDs (LQDs) zugeschrieben, während sich der höhere Energiepeak bei 1,11 eV auf die Emission von . bezieht die Grundzustände kleinerer QDs (SQDs) [15]. Daraus schließen wir, dass die asymmetrische Form bei sehr geringer Anregungsleistung und niedriger Temperatur auf die Lumineszenz zurückzuführen ist, die aus einer bimodalen Größenverteilung der Punkte stammt [16]. Darüber hinaus können Peaks, die von der InGaAs-Quantentopfschicht stammen, die Rekombination zwischen Elektronen im GaAs-Leitungsband und Löchern auf der Kohlenstoffakzeptorebene (e-CAs ) [17] und die GaAs-Bandlücke werden um 1.35, 1.49 bzw. 1.51 eV gesehen. Um diese Zuordnung zur asymmetrischen Form zu bestätigen, haben wir PL-Messungen bei verschiedenen Laserleistungen im Bereich von 10 bis 100 mW durchgeführt. Wir führten auch AFM-Messungen an einer ungedeckelten Struktur ähnlich der untersuchten durch. Aus Abb. 5 ist klar, dass die Heterostruktur eine leistungsunabhängige PL-Form hat. Abgesehen vom höchsten Anregungsspektrum werden die PL-Intensität und die Linienbreite des hochenergetischen PL-Peaks der Heterostruktur nicht signifikant verändert. Außerdem beträgt der Energieabstand zwischen den beiden PL-Peaks (Abb. 5) etwa 50 meV. Wie erwartet zeigt das AFM-Bild, dass die QDs in der fünften Schicht eine bimodale Größenverteilung mit einer gesamten QDs-Dichte von 7 × 10 10 . aufweisen cm^(−2). Unter der Annahme, dass die niederenergetischen Seitenpeaks der Heterostruktur dem Grundzustand großer QDs (LQDs) entsprechen, können wir sagen, dass die hochenergetischen Peaks bei hoher Leistung das Ergebnis der Grundzustände relativ kleiner QDs (SQD ).
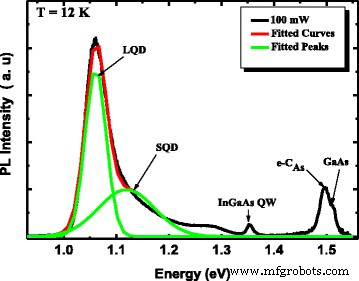
Bei niedriger Temperatur (12 K) gemessenes PL-Spektrum der fünfschichtigen gestapelten InAs/InGaAs-QD-Heterostruktur. Eine Linienformanalyse von Spektren beweist, dass das QD-PL-Signal eine Faltung von zwei gaußförmigen Peaks ist, wie durch durchgezogene Linien . gezeigt

Anregungsleistungsabhängige normalisierte PL-Spektren der InAs/InGaAs-QD-Heterostruktur, gemessen bei 12 K
Um einen Einblick in die PL-Rekombinationsmechanismen zu erhalten, werden temperaturabhängige PL-Messungen an der Heterostruktur von 10 bis 300 K durchgeführt und in Abbildung 6 dargestellt. Abbildung 7 zeigt die PL-Energieposition des Hauptpeaks im Zusammenhang mit der Emission von LQDs. Dieser Peak zeigt eine abnormale Temperaturabhängigkeit zwischen 10 und 100 K im Vergleich zu anderen ternären III-V-Legierungen wie herkömmlichem GaAlAs [18]. In diesem Temperaturbereich (Region (i)) wird eine Rotverschiebung von etwa 12 meV beobachtet. Diese Verschiebung ist auf die Rekombination von Exzitonen über die lokalisierten Zustände innerhalb des Ensembles der inhomogen verteilten LQDs zurückzuführen. Wenn die Temperatur innerhalb dieses Temperaturbereichs ansteigt, werden Ladungsträger thermisch aktiviert und von den kleineren auf die größeren QDs innerhalb des Ensembles übertragen, wo sie schließlich durch Strahlung rekombinieren. Dies macht es wahrscheinlich, dass die beobachteten Phänomene auf die große Punktgrößenstreuung in unserer Struktur zurückzuführen sind (siehe AFM-Einschub). Die charakteristische Temperatur, bei der die beiden Rekombinationsprozesse (lokalisierte und delokalisierte Träger) gleichermaßen am PL-Signal beteiligt sind, wird als T . bezeichnet loc/deloc . Dann steigt die Spitzenenergie zwischen 100 und 120 K (Region (ii)) an. Dies ist auf das Entweichen von Trägern aus den flacheren Staaten in die höheren zurückzuführen. Die charakteristische Temperatur wird als T . bezeichnet Flucht . Selbst bei hoher Temperatur (Bereich (iii)) werden die Exzitonen vollständig delokalisiert und eine Band-zu-Band-Rekombination wird wiederhergestellt.

Temperaturabhängige PL-Spektren der InAs/InGaAs-QD-Heterostruktur, gemessen bei einer Anregungsleistung von 100 mW

LQD PL Peakenergien der untersuchten InAs/InGaAs QD Heterostruktur gemessen bei verschiedenen Temperaturen
Um den Rekombinationsprozess in InAs/InGaAs/GaAs-Multi-Stacked-QDs besser zu verstehen, haben wir die zeitaufgelöste PL unter Verwendung der zeitkorrelierten Photocounting-Technik untersucht. Theoretisch wurde vorhergesagt, dass die Exzitonenzerfallslebensdauer von QDs temperaturempfindlich ist [19]. Experimentelle Messungen haben gezeigt, dass die Lebensdauern tatsächlich eine Temperaturkonstante unterhalb einer kritischen Temperatur sind [20]. Markuset al. [21] berichteten über eine konstante Lebensdauer von etwa 950 ps über einen weiten Temperaturbereich innerhalb des experimentellen Fehlers.
Abbildung 8a zeigt das PL-Zerfallsspektrum zwischen 17 und 240 K für eine Detektionsenergie von 1,06 eV und eine Anregungsenergie (λ exz = 514 nm). Diese Spektren sind theoretisch durch eine monoexponentielle Funktion mit einer Abklingzeit von ~1000 ps bei niedrigeren Temperaturen gut angepasst. Diese langsame Abklingzeit im Vergleich zu III-V-Halbleiterdünnfilmen [22] ist ein Zeichen für das Vorhandensein lokalisierter Zustände [23], und die Rekombination der Ladungsträger am LQD-Peak sollte rein strahlend sein. Tatsächlich brauchen photogenerierte Elektronen und Löcher bei niedriger Temperatur, bevor sie rekombinieren, Zeit, um Exzitonen zu bilden und ihre Energie zu entspannen, um von den flachen lokalisierten Zuständen eingefangen zu werden. Diese Phänomene führen zu einer langsamen Abklingzeit. Der Temperatureinfluss auf die PL-Abklingzeit wurde untersucht und zeigt das Vorhandensein von zwei verschiedenen Regimen, wie in Abb. 8b [24] dargestellt. Wir bemerken, dass die mit der niedrigeren Energie des PL-Bands (LQDs (1,06 eV)) verbundene Abklingzeit fast konstant ist (1000 ps) bis 140 K und dann mit steigender Temperatur abnimmt.

a Abklingzeit des LQDs-Peaks gegenüber der Probentemperatur bei einer Wellenlängenanregung von 514 nm. b Typische Abklingintensität der Photolumineszenz im Vergleich zur Temperatur des LQD-Peaks, gemessen bei einer Anregungswellenlänge von 514 nm
Theoretischer Ansatz
Um die anomale Temperaturabhängigkeit von PL zu verstehen, wurde die PL-Peakposition mit dem von Li et al. entwickelten LSE-Modell untersucht. [25, 26]. Tatsächlich liefert dieses quantitative Modell eine zufriedenstellende Erklärung für die anormalen spektralen Eigenschaften der lokalisierten Lumineszenz, die zuvor in mehreren III–V-Materialien beobachtet wurden, wie z. B. borbasierten B(In)GaAs/GaAs-Legierungen [27, 28] und InGaAs/GaAs MQWs [29, 30]. Das Modell nahm an, dass der lokalisierte Zustand eine Gaußsche Energieverteilung für die Zustandsdichte hat, die gegeben ist durch:
$$ \rho(E)={\rho}_o{e}^{-{\left(\frac{E-{E}_{\mathrm{ch}}}{2{\sigma}^2}\ rechts)}^2} $$ (1)Wo σ und E ch sind der verbreiternde Parameter für die Verteilung der lokalisierten Zustände (Lokalisierungstiefe) bzw. das Barriereniveau, das die Träger zum Transfer überwinden müssen. Im quasistationären Zustand kann die Dynamik der lokalisierten Exzitonen durch die folgenden Geschwindigkeitsgleichungen beschrieben werden:
$$ \frac{dN\left( E, T\right)}{dt}=G(E)+\frac{\gamma_c N\hbox{'}\left( E, T\right)\rho(E) }{\Lambda}-\frac{N\left( E, T\right)}{\tau_{\mathrm{tr}}}{e}^{\frac{E-{E}_a}{K_B T} }-\frac{N\left( E, T\right)}{\tau_{\mathrm{r}}}=0 $$ (2)Die Parameter τ r , τ tr , γ c , K B , Λ, und N ' repräsentieren die Ladungsträgerrekombinationszeit (Strahlungslebensdauer), die Ladungsträgerübertragungszeit (nichtstrahlende Lebensdauer), den Wiedereinfangskoeffizienten, die Boltzmann-Konstante, die Gesamtzahl der lokalisierten Zustände und die Gesamtzahl der Ladungsträger, die thermisch außerhalb des lokalisierten Staaten. G (E ) stellt die Rate der Trägererzeugung dar. Die Größe \( \frac{\gamma_c N\hbox{'}\left( E, T\right)\rho (E)}{\Lambda} \) ist die Anzahl der Träger, die von den lokalisierten Zuständen pro Einheit wieder eingefangen werden Zeit. Der dritte Term rechts gibt die thermische Entweichungsrate der lokalisierten Träger an. Der letzte repräsentiert die Entvölkerungsrate von Trägern aufgrund der strahlenden Rekombination. Die Trägerpopulationsdichte lokalisierter Träger ist proportional zur Verteilungsfunktion und Dichte der Zustände lokalisierter Träger. Tatsächlich ist die Lösung von Gl. (2) kann durch Gl. (3).
$$ N\left( E, T\right)=\frac{\rho_o{e}^{-{\left(\frac{E-{E}_0}{2{\sigma}^2}\right) }^2}}{\left[\frac{\tau_{\textrm{tr}}}{\tau_{\textrm{r}}} + exp\left(\frac{\left( E-{E}_ {\textrm{ch}}\right)}{K_{\textrm{B}} T}\right)\right]} $$ (3)wo E 0 ist die zentrale Energie. Mathematisch ist die Temperaturabhängigkeit der Peakposition aufgrund der thermischen Umverteilung der Ladungsträger innerhalb der lokalisierten Zustände bestimmt aus \( \frac{\partial N\left( E, T\right)}{\partial t}=0 \) gegeben durch :
$$ E(T)={E}_0- x(T){K}_B T $$ (4)Wo x (T ) ist die numerische Lösung der nichtlinearen Gl. (5):
$$ x{e}^x=\left[{\left(\frac{\sigma}{K_b T}\right)}^2- x\right]\left(\frac{\tau_{\mathrm{r }}}{\tau_{\mathrm{tr}}}\right) exp\left[\frac{\left({E}_0-{E}_{\mathrm{ch}}\right)}{K_{ \mathrm{B}} T}\right] $$ (5)
Gleichung 5 hat nur eine Lösung für \( 0
Es ist bekannt, dass die Bandlücke eines idealisierten Halbleitermaterials üblicherweise durch die Passler-Reichsformel beschrieben wird [32]. Berücksichtigt man die Korrektur aufgrund des thermischen Umverteilungskoeffizienten, wird die Variation der Peakposition der Lumineszenz unter Verwendung des LSE-Modells, beschrieben durch Gl. (7):
wo θ ist ein charakteristischer Temperaturparameter, von dem erwartet wurde, dass er mit der Debye-Temperatur θ . vergleichbar ist D . Für T>>>θ , sehen wir, dass α nur die Grenze des Betrags der ersten Ableitung \( {\frac{dEg(T)}{dT}}_{T\to \infty}\) darstellt. Der Exponent „p“ hängt mit der Form der zugrunde liegenden Elektron-Phonon-Spektralfunktion zusammen [33]. Das Modell bietet eine gute Anpassung an die experimentelle Entwicklung, die durch Abb. 9 bestätigt wird. Die Anpassungsparameter sind in Tabelle 2 zusammengefasst.
Temperaturabhängige Photolumineszenzentwicklung des LQD-Peaks (durchgezogene schwarze Quadrate ) angepasst mit dem empirischen Passler-Gesetz (blaue durchgezogene Linie ) und die modifizierte Passler-Beziehungswahrheit zum LSE-Modell (rote durchgezogene Linie )
Die PL-Spitzenenergie hängt stark von der in Abb. 10 dargestellten thermischen Umverteilung ab. Letzteres deutet auf einen schnellen Anstieg im Bereich der kryogenen Temperatur hin. Das Maximum der thermischen Umverteilung entspricht dem Maximum der Rotverschiebung in der Energieentwicklung (~50–100 K). Im Bereich hoher PL-Temperatur nimmt die thermische Umverteilung exponentiell ab und neigt zur Aufhebung, da ab 150 K der Delokalisierungsprozess und die Rückkehr zu Band-zu-Band-Übergängen beginnt. Dies können wir auch beobachten, wenn die klassische und die modifizierte Kurve überlagert werden (Abb. 9). Der Exponent „p“ zeigt an, dass der Beitrag der longitudinalen akustischen (LA) Phononen signifikanter ist als der Beitrag der longitudinalen optischen (LO ) Phononen. Dieser Beitrag scheint im Bereich hoher PL-Temperaturen dominant zu sein, wo die Emission durch Phononen unterstützt wird. Der bimodale Verteilungsprozess öffnet einen Kopplungskanal zwischen QDs, der durch delokalisierte Elektronen- und Lochzustände dargestellt wird, die durch eine Energie E . getrennt sind ch . Der Ursprung dieses Kopplungskanals ist noch immer umstritten [34,35,36]. Der Kopplungskanal kann jedoch als Zwischenzustand angesehen werden, der zwischen zweidimensionalen WL- und nulldimensionalen QD-Zuständen existiert [37]. Man kann sich also vorstellen, dass die Ladungsträger in den QD-Zuständen aufgrund der geringeren benötigten Aktivierungsenergie leichter thermisch zum Kopplungskanal angeregt werden können als die WL und dann in endlicher Entfernung auf ihre benachbarten QDs übertragen werden. Es erscheint wie das Fermi-Dirac-Niveau in der Fermi-Dirac-Verteilung. Diese Energie E ch kleiner ist als die Aktivierungsenergie E a extrahiert aus dem Arrhenius-Diagramm (Abb. 11). Der Grund, warum E a größer ist, kann durch die Tatsache erklärt werden, dass Ladungsträger eine größere Energie benötigen, um die Benetzungsschicht (WL) zu erreichen, wie schematisch in Fig. 12 gezeigt. Darüber hinaus ist die Größe der Differenz ΔE = E ch − E 0 spielt eine bedeutendere Rolle bei der Bestimmung der anormalen Temperaturabhängigkeit der Lumineszenz lokalisierter Träger. Wir sollten beachten, dass die beiden Fälle E ch − E 0> 0 und E ch − E 0 < 0, existiert aus physikalischer Sicht, wird aber meist als „positive“ thermische Aktivierungsenergie bezeichnet. In unserem Fall bedeutet dies, dass E ch liegt 4 meV unter E 0 in dem lokalisierte Träger thermisch zu Zuständen (oder Plätzen im Realraum) mit höheren Energien aktiviert werden. Sie verringert sich im Vergleich zu einer einzelnen InAs-QD-Schicht mit In0,15 Ga0,85 Als spannungsreduzierende darunterliegende Schicht [10]. Die von σ . zugewiesene potenzielle Fluktuationstiefe ist ein Ergebnis der Größenverteilungsinhomogenität von QDs. Die potenzielle Tiefe beträgt 19 meV. Es verringert sich, indem die Anzahl der Stapel von InAs/In0,11 . erhöht wird Ga0,89 As/GaAs-QDs. Als Ergebnis können wir ableiten, dass die Verringerung der Potentialtiefe die Struktureffizienz im Vergleich zu der von Ilahi et al. untersuchten einlagigen InAs/InGaAs/GaAs-QDs erhöht. und Helmi et al. [10, 36].
Temperaturabhängige thermische Umverteilung numerisch bestimmt. Die charakteristischen Temperaturen (T loc/deloc und T Flucht ) sind in Bezug auf den Lokalisierungs-Delokalisierungsprozess angegeben
Arrhenius-Anpassung der untersuchten Probe. Die normalisierte integrierte Intensität (schwarze Kreise ) ist mit drei Aktivierungsenergien ausgestattet (rote durchgezogene Linie )
Schema der QD-Verteilung lokalisierter Elektron/Loch-(Exziton)-Zustände (WL Benetzungsschicht, CH Übertragungskanal des Mobilfunkanbieters)

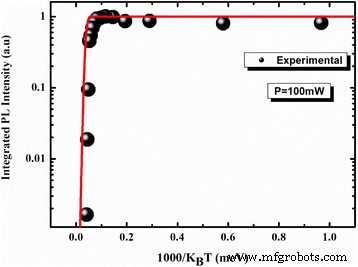
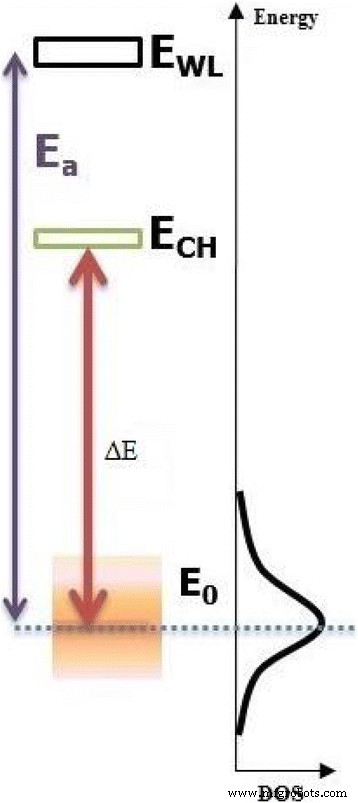
Schlussfolgerung
Zusammenfassend lässt sich sagen, dass wir erfolgreich GaAs-basierte SC mit einem Multi-Stack von InAs-QDs hergestellt haben, indem wir eine InGaAs-Schicht auf den QDs bedeckt und GaAs-Abstandsschichten eingefügt haben. Die beiden wichtigsten spektralen Merkmale, die in den dielektrischen Funktionsspektren der InAs/InGaAs/GaAs-QD-Heterostruktur bei 3 und 4,5 eV beobachtet wurden, werden dem E . zugeschrieben 1 und E 2 CP-Strukturen von GaAs bzw. InAs. Das PL-Spektrum der InAs-QDs in der GaAs-Matrix ist intensiv und weist eine asymmetrische Form auf, was auf das Wachstum einer hochwertigen, mehrfach gestapelten InAs-QD-Struktur hinweist. Der Beitrag größerer und relativ kleinerer QDs zum PL-Spektrum wird ebenfalls demonstriert. Die Lumineszenzmessungen wurden mit dem entwickelten LSE-Modell erfolgreich modelliert und neu interpretiert. Die theoretische Studie hat die beobachteten temperaturabhängigen Spektren quantitativ interpretiert und die komplizierten Mechanismen der spontanen Emission in mehrfach gestapelten InAs/InGaAs/GaAs-QDs basierend auf den Anpassungsparametern aufgeklärt. Diese Studie schlägt einen Weg vor, die Effizienz von InAs/GaAs-QD-Strukturen für ihren Einsatz in Photovoltaikanwendungen zu verbessern. Diese Ergebnisse helfen, das Verständnis der temperaturabhängigen Ladungsträgerdynamik in dehnungstechnischen QDs zu verbessern, um die Effizienz der untersuchten Struktur zu verbessern. Im Anschluss an diese Arbeit werden wir den Einfluss der Orientierung sowie die Zunahme der Anzahl von InAs/GaAs-QDs der Multi-Stack-Struktur auf die Lokalisierungstiefe untersuchen.
Nanomaterialien
- Einsatz von Winkeln zur Verbesserung der Zukunft der Elektronik
- Erkennen des Magnetismus des Kerns eines einzelnen Atoms
- Kunststoffkomponenten:Wegbereiter für Automobileffizienz
- Helle Einzelphotonenquelle bei 1,3 μm basierend auf InAs-Doppelschicht-Quantenpunkt in Micropillar
- Bipolare Effekte der Photospannung metamorpher InAs/InGaAs/GaAs-Quantenpunkt-Heterostrukturen:Charakterisierungs- und Designlösungen für lichtempfindliche Bauelemente
- Reversible elektrochemische Kontrolle der photoangeregten Lumineszenz von Kern/Schale-CdSe/ZnS-Quantenpunktfilm
- Photovoltaische Leistung einer Nanodraht/Quantenpunkt-Hybrid-Nanostruktur-Array-Solarzelle
- Eliminierung der bimodalen Größe in InAs/GaAs-Quantenpunkten zur Herstellung von 1,3-μm-Quantenpunktlasern
- Die globale Erwärmung wird die Effizienz von Solarzellen verringern
- CNC-5-Achsen-Fräsen als Wegbereiter für eine effizientere Bearbeitung



