Bipolare Effekte der Photospannung metamorpher InAs/InGaAs/GaAs-Quantenpunkt-Heterostrukturen:Charakterisierungs- und Designlösungen für lichtempfindliche Bauelemente
Zusammenfassung
Der bipolare Effekt des GaAs-Substrats und benachbarter Schichten auf die Photospannung von vertikalen metamorphen InAs/InGaAs im Vergleich zu pseudomorphen (konventionellen) InAs/GaAs-Quantenpunktstrukturen (QD) wurde untersucht. Sowohl metamorphe als auch pseudomorphe Strukturen wurden durch Molekularstrahlepitaxie gezüchtet, wobei Bodenkontakte entweder an den gewachsenen n + -Puffer oder das GaAs-Substrat. Die Merkmale von QDs, Benetzungsschichten und Puffern wurden in den photoelektrischen Spektren beider pufferkontaktierter Strukturen identifiziert, während die Spektren der substratkontaktierten Proben den zusätzlichen Beginn zeigten, der EL2-Defektzentren zugeschrieben wird. Die mit dem Substrat kontaktierten Proben zeigten eine bipolare Photospannung; Dies wurde als Ergebnis der Konkurrenz zwischen QD-bezogenen Komponenten und ihren Mantelschichten mit den substratbezogenen Defekten und der tiefsten gewachsenen Schicht vorgeschlagen. In den Spektren der pufferkontaktierten Strukturen wurden keine direkten Substrateffekte gefunden. Ein bemerkenswerter negativer Einfluss der n + -GaAs-Pufferschicht auf dem Photospannungs- und Photoleitfähigkeitssignal wurde in der InAs/InGaAs-Struktur beobachtet. Durch die Analyse der erhaltenen Ergebnisse und der durchgeführten Berechnungen konnten wir Einblicke in das Design metamorpher QD-Strukturen geben, die für die Entwicklung neuartiger effizienter photonischer Geräte nützlich sein können.
Hintergrund
In den letzten zwei Jahrzehnten haben Verbundmaterialien mit Halbleiter-Nanostrukturen aufgrund ihrer Lichtempfindlichkeit, einfachen und geringen Herstellungskosten, spektralen Durchstimmbarkeit und hocheffizienten Emission mit kurzer Lebensdauer große Verwendung in photonischen Anwendungen gefunden [1,2,3,4,5 ]. In(Ga)As-Quantenpunkt(QD)-Heterostrukturen sind eine wichtige Klasse von infrarotempfindlichen Nanostrukturen, die in verschiedenen photonischen Geräten wie Lasern [2, 6], Einzelphotonenquellen [7, 8], Photodetektoren [9,10,11,12,13] und Solarzellen [14,15,16]. Zahlreiche Untersuchungen wurden durchgeführt, um die photoelektrischen Eigenschaften solcher lichtempfindlicher Vorrichtungen zu verbessern. So kann beispielsweise der Lichtempfindlichkeitsbereich über die Anregung durch intermediäre Bandlücke [17, 18] oder multiple Exzitonenerzeugung [19, 20] erweitert werden, sodass die Leistungsumwandlungseffizienzen von QD-basierten Solarzellen theoretisch die Grenzen einzelner -Bandgap-Solarzellen [21]. Die Methoden wie Strain-Balancing [22] und Misfit-Management-Technik [23] sowie das thermische Glühen [24] werden verwendet, um Dehnungen in diesen Strukturen zu reduzieren, den Arbeitsbereich zu bedienen [25] und die Photoreaktion aufgrund der Unterdrückung von spannungsbedingten Defekten [26], die als Rekombinationszentren fungieren können.
Ein effizientes Verfahren zur Spannungsreduktion basiert auf dem Wachstum eines metamorphen InGaAs-Puffers (MB) anstelle des herkömmlichen GaAs-Puffers. Infolgedessen haben InAs/InGaAs-QD-Strukturen im letzten Jahrzehnt viel Interesse geweckt [27,28,29]. Durch das Aufwachsen der QDs auf dem InGaAs-MB können wesentliche Unterschiede im Bildungsprozess und den optischen QD-Eigenschaften im Vergleich zu herkömmlichen in GaAs-Matrix beobachtet werden [25, 30, 31, 32, 33]. Zum Beispiel reduziert die InGaAs-Begrenzungsschicht die Gitterfehlanpassung zwischen QDs und Puffer und somit Spannungen in QDs. Dadurch wird die Bandlücke von InAs reduziert und eine deutliche Zunahme der Emissionswellenlänge beobachtet [34]. Die Anwendung des MB als eingrenzendes Material ermöglicht es, seinen Wert in das Telekommunikationsfenster bei 1,3 und 1,55 μm zu verschieben [28, 29, 35, 36].
Außerdem gab es hoffnungsvolle Versuche, die photoelektrischen Eigenschaften der metamorphen InAs-QD-Strukturen auf das Design von lichtempfindlichen Geräten wie metamorphen Infrarot-Photodetektoren [11,12,13] und Solarzellen [37,38,39] anzuwenden. Einige Studien wurden durchgeführt, um das Strukturdesign zu entwickeln [25, 31, 32, 33] und andere, um die photoelektrischen Eigenschaften zu verbessern [39, 40]. Es werden Untersuchungen zur Reduzierung der Dehnungen in den Heterostrukturen durchgeführt [34, 41], da dies zu einer wesentlichen Verbesserung der Photostromdichte und des spektralen Ansprechverhaltens von Solarzellen [39, 40] sowie der Photoemissionseffizienz solcher Strukturen führt [ 29, 32, 42].
Die Entwicklung der lichtempfindlichen Geräte erfordert eine eingehende Untersuchung der photoelektrischen Eigenschaften. Photospannungs- (PV) oder Photoleitfähigkeits-(PC)-Studien sind ein ideales Werkzeug zur Bestimmung der Photoantwort als Funktion der Lichtenergie, der Übergänge zwischen den Pegeln, des Trägertransports und des Betriebsbereichs des Geräts [10, 43, 44]. Obwohl in den letzten Jahren einige Studien zu den photoelektrischen Eigenschaften von Strukturen mit metamorphen InAs-QDs durchgeführt wurden [37,38,39, 43], bleiben die vollständigen Aspekte des Photoreaktionsmechanismus ebenso wie der Einfluss des MB über die Eigenschaften der Nanostrukturen. Insbesondere die Auswirkungen des GaAs-Substrats und verwandter Grenzflächen auf die photoelektrischen Spektren von InAs/InGaAs/GaAs-QD-Strukturen wurden nicht im Detail untersucht. Obwohl erhebliche Anstrengungen unternommen werden, um den Substrateinfluss zu vermeiden, wird die Photoantwort sowohl vom Substrat als auch von benachbarten Schichten beeinflusst, die durch Molekularstrahlepitaxie (MBE) aufgewachsen sind. Während also die angewandte Kontaktgeometrie die unteren Schichten und das Substrat elektrisch inaktiv halten soll, wurde von uns in einer früheren Untersuchung ein bemerkenswerter negativer Einfluss auf PV und Photostrom festgestellt [43]. Vor kurzem haben wir die photoelektrischen Eigenschaften des metamorphen InAs/In0,15 . verglichen Ga0,85 Als QD-Struktur mit denen einer Standard-InAs/GaAs-QD-Struktur und stellte fest, dass der Photostrom von metamorphem InAs/In0,15 Ga0,85 Da Heterostrukturen nicht durch Niveaus im Zusammenhang mit Defekten in der Nähe von QD beeinflusst wurden [45]. Darüber hinaus wurde der Schluss gezogen, dass effiziente photonische Bauelemente bei 1,3 μm mit ähnlichen Nanostrukturen als aktives Material entwickelt werden können.
In dieser Arbeit setzen wir die Untersuchung der photoelektrischen Eigenschaften der Heterostrukturen mit InAs-QDs, die entweder in das metamorphe In0.15 . eingebettet sind, fort Ga0,85 Als oder konventionelle GaAs-Puffer, mit Fokus auf die Wirkung von GaAs-Substrat und nahegelegenen MBE-Schichten. Um ein klares Verständnis der Rolle von Substrat- und Pufferschichten zu erlangen, betrachteten wir die Strukturen mit Bodenkontakten auf (i) dem In0,15 Ga0,85 Als Pufferschicht oder (ii) das untere GaAs-Substrat (siehe Abb. 1). Somit floss der Strom je nach Auswahl des unteren Kontakts durch (i) nur die QDs und Pufferschichten und (ii) die komplette Struktur einschließlich der Substrate und deren Grenzflächen zu MBE-Schichten. Die Analyse der Ergebnisse und Berechnungen ermöglichten uns einen Einblick in das beste Design für Lichtsensoren auf metamorphen QD-Strukturen.
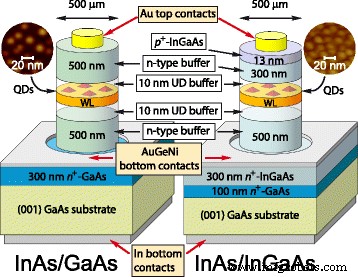
(Farbe online) Schemata des metamorphen InAs/In0.15 Ga0,85 Als/si -GaAs (rechts) und InAs/GaAs/si -GaAs (links) QD-Proben untersucht; AFM-Bilder der nicht abgedeckten Strukturen werden gezeigt
Methoden
Die Strukturen wurden durch MBE auf (001) halbisolierenden (si ) GaAs-Substrate. Substrate waren n -type, mit Werten von 3 × 10 7 cm −3 Restladungsträgerkonzentration, Dicke von 500 μm und ein spezifischer Widerstand von 2 × 10 7 Ω × cm. Die metamorphen InAs/InGaAs QD-Strukturen bestehen aus (i) 100-nm n + -GaAs-Pufferschicht, gewachsen bei 600 °C, (ii) 300 nm dick n + -In0,15 Ga0,85 Als MB mit n = 5 × 10 18 cm −3 gewachsen bei 490 °C, (iii) 500 nm dick n -In0,15 Ga0,85 Als MB mit n = 3 × 10 16 cm −3 gewachsen bei 490 °C, (iv) 3,0 Monoschichten (MLs) von selbstorganisierten InAs-QDs, eingebettet in ein 20-nm-undotiertes In0,15 Ga0,85 Als bei 460 °C gewachsene Schicht, (v) 300 nm n -In0,15 Ga0,85 Als obere Deckschicht mit n = 3 × 10 16 cm −3 gezüchtet bei 490 °C und (vi) 13 nm p + -dotiert In0,15 Ga0,85 Als Mütze mit p = 2 × 10 18 cm −3 bei 490 °C gezüchtet (Abb. 1). Die Wachstumsrate betrug 1,0 ML/s, mit Ausnahme der QDs, die mit einer Wachstumsrate von 0,15 ML/s gezüchtet wurden. Die undotierten Schichten sind notwendig, um QDs von n . zu trennen -dotierten Regionen und damit den Einfluss nichtstrahlender Rekombinationszentren zu reduzieren und so die QD-Lichtemissionseffizienz zu maximieren [30, 46]. Die Standard-InAs/GaAs-QD-Strukturen bestehen aus (i) 300-nm n + -GaAs-Pufferschicht mit n = 5 × 10 18 cm −3 gewachsen bei 600 °C, (ii) 500 nm dick n -GaAs MB mit n = 3 × 10 16 cm −3 bei 600 °C gewachsen, (iii) 3,0 ml InAs-QDs eingebettet in eine 20 nm undotierte GaAs-Schicht, die bei 460 °C gewachsen sind, und (iv) 500 nm n -GaAs obere Deckschicht mit n = 3 × 10 16 cm −3 bei 600 °C angebaut. Die Wachstumsrate betrug 1,0 ML/s, mit Ausnahme der QDs, die mit einer Wachstumsrate von 0,15 ML/s gezüchtet wurden.
Rasterkraftmikroskopie (AFM)-Bilder der nicht abgedeckten Strukturen sind in Abb. 1 gezeigt. Durch die Analyse von AFM-Daten ähnlicher Strukturen wurden die häufigsten Werte der QD-Größen auf 20 nm (Durchmesser) und 4,9 nm (Höhe) für metamorphe . geschätzt QDs und 21 nm (Durchmesser) und 5,0 nm (Höhe) für Standard-QDs [30, 31, 45].
Für photoelektrische Messungen wurden runde 500 μm dicke Mesas auf die Strukturen bis zum unteren Puffer geätzt n + Schichten; Oben auf Mesas wurden dann Au-rektifizierende Top-Kontakte mit einem Durchmesser von 400 μm und einer Dicke von 70 nm aufgedampft. Um ohmsche Kontakte auf der Unterseite zu erhalten n + -InGaAs und n + -GaAs-Pufferschichten bzw. Au0,83 Ge0,12 Ni0,05 Legierung wurde bei 400 °C für 1 min in einer Stickstoffatmosphäre abgeschieden. Dicke ohmsche Indiumkontakte wurden auf den Böden von Substraten in anderen Stücken derselben Proben hergestellt, um Messungen auch mit Stromfluss durch den GaAs-Puffer und si -GaAs-Substrat. Der Widerstand der Kontakte wurde vom I . bestätigt -V Messungen, Kontakt mit einem Stück Substrat; die Strom-Spannungs-Kennlinie erwies sich als linear (Daten nicht gezeigt).
Nach dem in Lit. vorgeschlagenen Ansatz. [47] und in anderen Werken verwendet [48, 49], das dünne p + -InGaAs-Schicht zwischen dem Au-Kontakt und dem n -InGaAs-Schicht wurde verwendet, um die Höhe der Schottky-Barriere zu erhöhen, da die Struktur durch die einfache Abscheidung eines Metalls auf n -InGaAs wies eine relativ niedrige Schottky-Barrierehöhe auf. Daher ist die Abscheidung von dünnem p + -InGaAs-Schicht vergrößert die Schottky-Barrierehöhe auf eine ähnliche Höhe wie bei einem Au-GaAs-Kontakt, wobei die Ähnlichkeit des Barriereprofils sowohl für die metamorphen als auch für die InAs/GaAs-Strukturen beibehalten wird.
Für das Struktur- und Kontaktdesign sowie das Verständnis des Energieprofils für beide Strukturen, das aus dem In0,15 . besteht Ga0,85 As- oder GaAs-MBs, In(Ga)As-QDs, undotierte Deckschicht und Au/AuGeNi-Kontakte wurden die Berechnungen mit der Tibercad-Software durchgeführt [50]. Bandprofile wurden in der Drift-Diffusions-Näherung modelliert, wobei Dehnungsbedingungen, Dichten von Fallen in Bezug auf Defekte im InGaAs/GaAs-Grenzflächenbereich, Verarmungsschichten in der Nähe von Kontakten und geeignete Schottky-Barrierehöhen berücksichtigt wurden. Für die Berechnung der metamorphen QD-Bandenprofile wurden Größen aus AFM-Daten berücksichtigt und Dehnungseffekte berücksichtigt, einem Ansatz folgend, der bereits in Refs. [42, 51]. Die Berechnung von QD-Quantenniveaus liegt außerhalb des Rahmens dieses Papiers, und die QD-Modellierung wurde zuvor in Lit. [45]. In dieser Arbeit berechnen wir jedoch Bandprofile der gesamten Heterostruktur einschließlich des Substrats.
Vertikaler Photostrom und PV-Spektren wurden im Bereich von 0,6 bis 1,8 eV unter Verwendung einer Anregungsgeometrie mit senkrechtem Einfall bei Raumtemperatur (RT) (300 K) und derselben Lichtquellenintensität (1,5 mW/cm 2 .) gemessen ). Der Photostrom wurde mit einem Stromverstärker und einer Gleichstromtechnik [10, 43, 44, 45] mit 1 V Vorspannung gemessen. Der Strom wurde als Spannungssignalabfall über einem Reihenlastwiderstand von 100 kΩ gemessen (siehe Einschub in Abb. 5). Bei 532 nm angeregte Photolumineszenz (PL) wurde bei 300 K gemessen. Einige Informationen zu Strukturen und Methoden sind in Lit. [45].
Ergebnisse und Diskussion
A. Photoelektrische Charakterisierung
Die PV-Spektren von beiden InAs/In0,15 Ga0,85 As- und InAs/GaAs-Proben sind in Abb. 2 dargestellt. Nur mit den MBE-Schichten kontaktiert, dicke n -InGaAs oder n -GaAs-Puffer, die Merkmale der Spektren wurden an anderer Stelle beschrieben [45]. Die Spektrumsschwelle von InAs/In0,15 Ga0,85 B. bei 0,88 eV steht im Zusammenhang mit der Grundzustandsabsorption im QD-Ensemble, die dem früher gemessenen Beginn der QD-Bande im PL-Spektrum bei RT entspricht [45] (Abb. 2a). Das metamorphe QD-Emissionsspektrum zeigt ein breites Band bei 0,94 eV, das im Telekommunikationsbereich bei 1,3 μm (0,95 eV) liegt, während das QD-PL eine gute Effizienz zeigt, wie in früheren Veröffentlichungen festgestellt wurde [30, 45, 46, 52]. Das breite Band des PV-Spektrums mit einem Spitzenwert von 1,24 eV und einer Flanke von 1,11 eV ist auf die Trägererzeugung im In0,15 . zurückzuführen Ga0,85 B. MB und Benetzungsschicht (WL) einschließlich des Weges durch die seichten Ebenen. Es sollte hinzugefügt werden, dass die In0.15 Ga0,85 Die berechnete Bandlücke für die MBE-gewachsene Schicht beträgt 1,225 eV [53] und die WL PL wird bei 1,2 eV beobachtet [45]. Darüber hinaus wird ein deutlicher starker Abfall über 1,36 eV beobachtet, der wahrscheinlich durch einen indirekten Effekt der stark dotierten GaAs-Pufferschicht verursacht wird, die sich außerhalb des Zwischenkontaktbereichs befindet, der in Ref. [43]. Die Pufferschicht ist mit zahlreichen flachen Niveaus und Bandungleichmäßigkeiten gefüllt, die von MBE-Wachstumsdefekten und Dotierungszentren herrühren, die die Interband-Absorption von GaAs rotverschieben [33, 46, 54, 55]. Für die konventionelle pufferkontaktierte InAs/GaAs-Nanostruktur stammt der Beginn bei 1,05 eV des PV-Spektrums in Abb. 2b vom QD-Grundzustand, wie durch das PL-Spektrum bestätigt, während der scharfe Schritt bei 1,3 eV mit dem Übergänge in der WL [56]. Das Merkmal nach 1,39 eV hängt offensichtlich mit der Absorption der oberen dotierten GaAs-Pufferschicht zusammen. Ein Mechanismus für diesen Effekt wird unten im Detail diskutiert.

(Farbe online) Raumtemperatur PV-Spektren der a metamorphes InAs/In0,15 Ga0,85 As und b InAs/GaAs-QD-Strukturen; PV wurde nur in Kontakt mit MBE-Schichten [45] (schwarze Kurven) und durch das halbisolierende si . gemessen -GaAs-Substrat (blau). Die mit dem si . gemessenen PV-Spektren -GaAs-Substrat werden für a . durch das Vorzeichen einer Spannung unter 1,68 bzw. 1,44 eV invertiert und b . Niederenergetische Teile der Kurven sind in den Einschübe angegeben; die vor [45] gemessenen QD-PL-Banden für beide Strukturen sind für die QD-Grundzustands-Energiepositionierung dargestellt (rot)
Wie oben erwähnt, der starke Abfall des PV-Signals über 1,36 eV im InAs/In0,15 Ga0,85 Da die Struktur mit n verwandt ist + - Untere GaAs-Schicht, die das Substrat bedeckt. Um die Auswirkungen der Schichten unter dem unteren AuGeNi-Kontakt auf die Photoantwort zu verdeutlichen, haben wir die photoelektrischen Eigenschaften der Strukturen unter Verwendung eines Indiumkontakts auf der Substratrückseite untersucht. Im Gegensatz zur vorherigen Au- und AuGeNi-Kontaktgeometrie, die die unipolare PV ermöglicht, wurde das bipolare Signal für die Strukturen beobachtet, die mit der Probenoberseite und der Substratrückseite kontaktiert wurden (Abb. 2). Es ist zu beachten, dass sich das PV-Vorzeichen entlang der Photonenenergieachse ändert und in Abb. 2 die Spektren beider Proben durch das Vorzeichen der Spannung unter 1,68 und 1,44 eV für InAs/In0,15 Ga0,85 As- bzw. InAs/GaAs-QD-Strukturen. Dabei gilt PV als positiv, wenn wie beim Kontakt zu den MBE-Schichten das positive Potential am oberen Au-Kontakt und das negative am unteren Kontakt anliegt.
Alle oben erwähnten optischen Übergänge tragen zum PV-Signal der Strukturen in der Substrat-Top-Kontaktgeometrie bei. Bei der Messung von PV durch das Substrat erfolgt der Signalbeginn für die metamorphen und konventionellen Strukturen jedoch bei etwa 0,72 eV. Der Beginn bei 0,72 eV wird dem Übergang vom EL2-Defektzentrum in si . zugeschrieben -GaAs-Substrat und zugehörige Grenzflächen nahe 0,75 eV unterhalb des GaAs-Leitungsbandes [57], unter Berücksichtigung der Möglichkeit eines Übergangs durch die flachen Defektebenen [46, 54, 55]. Die Aspekte bezüglich ihrer Lokalisation sowie der EL2-PC-Onset-Rotverschiebung wurden an anderer Stelle ausführlich diskutiert [10, 45]. Da in den Spektren der mit den InGaAs- oder GaAs-Puffern kontaktierten Proben kein Signal unterhalb der QD-bezogenen Banden beobachtet wurde (Abb. 2), schlussfolgern wir, dass das Substrat und die zugehörigen Grenzflächen keinen wesentlichen Einfluss auf die Eigenschaften von MBE-gezüchteten Heterostrukturen haben .
Um das Erscheinungsbild des PV-Signals in unseren Proben zu verstehen, sollte man sich Abb. 3 ansehen, in der wir die berechneten Bandprofile entlang der Wachstumsrichtung zeigen. Eine detaillierte Erklärung des PV-Ursprungs zwischen den Au- und AuGeNi-Kontakten findet sich in der vorherigen Veröffentlichung [45]. Zusammenfassend lässt sich sagen, dass die durch Licht angeregten Elektronen (Löcher) überwiegend in Richtung des Substrats (Oberfläche) driften, was ein positives Potential am Au-Kontakt und ein negatives am AuGeNi-Kontakt ergibt.

(Color online) berechnetes Bandenprofil im metamorphen InAs/In0,15 Ga0,85 As (up) und pseudomorphe InAs/GaAs (down) Strukturen, um den PV-Mechanismus zu erklären. Die Bandbiegung der tieferen Schichten unter dem AuGeNi-Kontakt ist grau dargestellt. Die in den PV-Spektren beobachteten optischen Übergänge sind durch vertikale Pfeile gekennzeichnet; fette Pfeile zeigen Driftrichtungen der optisch angeregten Ladungsträger unter dem internen Feld (PV-Erzeugung); E F ist Fermi-Energie. Die Berechnungen wurden mit der Software Tibercad durchgeführt [50]
Erklärung der bipolaren PV aus den Strukturen mit dem elektrisch aktiven si -GaAs-Substrate können ihre berechneten Bandstrukturen in Abb. 3 betrachtet werden. Wie zuvor können die in den oberen Schichten sowie in den QDs und WL erzeugten Ladungsträger „+“ oben und „–“ am Substrat ergeben. Das Fermi-Niveau im halbisolierenden Substrat liegt viel niedriger als das im n -dotierte MBE-Schichten. Daher biegt sich das Band in der Nähe des n + -GaAs/Substrat-Grenzfläche ist der im Rest der MBE-gewachsenen Struktur entgegengesetzt (siehe Abb. 3). Daher ist die Anregung im n + -GaAs-Schicht und -Substrat (über 1,36 eV) liefern ein entgegengesetztes PV-Signal zu dem von den QDs, WL und Puffern. Gleiches gilt für die Anregung durch EL2-Defekte (über 0,72 eV) des GaAs-Substrats und insbesondere EL2-ähnliche Defekte in n + -GaAs/GaAs-verspannter Bereich [46, 57]. Beitrag des Substrats und n + -GaAs auf das gesamte PV-Signal ist wesentlich stärker als das der oberen MBE-Schichten, und das negative Signal von PV wird im Allgemeinen bei niedrigeren Anregungsenergien beobachtet, während der Einfluss von InGaAs-Schichten und Nanostrukturen als Täler auf den jeweiligen Spektralkurven in Abb . 2. Dies wird deutlich durch den Vergleich der QDs-, WL- und Pufferspektralbänder auf den PV-Kurven der Strukturen, die mit MBE-Puffer kontaktiert wurden, mit den Tälern in den Spektren der mit der Substratoberseite kontaktierten Proben. Bei den höheren Energien wird die Anregung jedoch näher an der Probenoberfläche absorbiert und erreicht nicht die tieferen MBE-Schichten und das Substrat, was die Hauptquelle des negativen Signals ist. Daher wird das PV-Signal bei größeren Energien positiv. Das Vorhandensein von elektrisch aktiven si -Substrat führt zur Konkurrenz zwischen den Spektralkomponenten der oberen MBE-gewachsenen Schichten und den substratbezogenen Defekten und den n + -GaAs-Absorption.
Ansonsten wurde ein ähnliches charakteristisches Merkmal oberhalb von 1,35 eV mittels Oberflächen-PV-Spektroskopie in einer kürzlich durchgeführten detaillierten Studie von p . beobachtet -dotierte InAs/GaAs QD und InAs/InGaAs Dot-in-Well-Strukturen basierend auf si -GaAs-Substrate [58]. Der drastische Abfall der PV-Amplitude wurde im Gegensatz zu unserem Fall durch unterschiedliche Ladungsträger, die unter und über 1,35 eV erzeugt werden, erklärt. Unter Berücksichtigung der drastischen Unterschiede der genannten und vorliegenden Strukturen sowie der Besonderheiten der angewandten Methoden folgen wir jedoch unserer Interpretation eigener Ergebnisse.
Basierend auf dem Konzept der Bandverbiegung unterhalb des AuGeNi-Kontakts kann man den in Abb. 2a beobachteten starken Abfall des PV-Signals in der pufferkontaktierten metamorphen InAs/InGaAs-Struktur über 1,36 eV erklären. Diese spektrale Eigenschaft ist auf die Wirkung des Substrats und der tiefsten MBE n . zurückzuführen + -GaAs-Schicht. Tatsächlich bewegen sich die dort erzeugten Elektronen unter dem intrinsischen Feld zum AuGeNi-Kontakt und erzeugen dort ein zusätzliches elektrisches Feld, wodurch eine Barriere aufgrund der Bandverbiegung am InGaAs/GaAs-Heteroübergang offensichtlich zu gering ist, um ein wesentliches Hindernis für die Ladungsträger zu sein. Dies richtet die Bandbiegung in den oberen Schichten aus, die direkt zum PV beitragen, und reduziert somit die Zufuhr der photoangeregten Ladungsträger oberhalb der n + -GaAs-Schicht und folglich das gesamte PV-Signal.
Ein kleines Merkmal nahe 1,39 eV wird in Abb. 2b im Spektrum der pseudomorphen Probe in Kontakt mit den MBE-Puffern beobachtet, obwohl ein drastischer Abfall des Signals wie in der metamorphen Struktur über 1,36 eV erwartet werden sollte, unter Berücksichtigung einer ähnlichen Bandverbiegung in der Nähe von n + -GaAs/Substrat-Schnittstelle. Ein solches Merkmal ist nicht nur ein Attribut von Substrat und n + -dotiertes GaAs; solche Übergänge wurden in In(Ga)As/GaAs-QD-Strukturen basierend auf p . nachgewiesen -dotiertes [58] und undotiertes GaAs [10, 55]. Diese Übergänge treten offensichtlich auch in oberen GaAs-Schichten unserer pseudomorphen Struktur auf und kompensieren größtenteils den negativen Einfluss der substratnahen Schichten auf das PV-Signal. Als Ergebnis ist auf der schwarzen Kurve der InAs/GaAs-Probe in Abb. 2b nur ein vernachlässigbarer Einfluss der substratnahen Schicht zu beobachten und nicht der Abfall der Kurve der metamorphen, die von den tieferen GaAs-Schichten stammt, trotz eines ähnlichen bipolaren Effekt beobachtet bei direkter Beteiligung des Substrats an der PV-Bildung.
Der Grund für das kleine Merkmal nach 1,39 eV im Spektrum der mit den MBE-Puffern kontaktierten InAs/GaAs-Probe kann sich von dem oben besprochenen für die metamorphe InAs/InGaAs-Probe unterscheiden. Unserer Meinung nach ist dies auf den leichten Signalabfall zurückzuführen, der durch die Absorptionskante des oberen MBE-gewachsenen 500 nm dicken GaAs-Puffers verursacht wird, der die QDs und WL abschattet, die bei diesen Photonenenergien effizienter zur PV beitragen. Tatsächlich werden in QDs und WL erzeugte Elektronen und Löcher zu verschiedenen Seiten getragen und vermeiden eine Rekombination, im Gegensatz zur Volumenerzeugung, wo eine Rekombination viel wahrscheinlicher ist. Dies ist der Hauptgrund für die effektive Detektion von Phototrägern, die selbst aus einer einzigen Schicht von QDs und WL stammen. Photonen höherer Energien werden Band-zu-Band in oberflächennahen n . absorbiert -GaAs-Pufferschicht und Elektronen entweichen von den Löchern in das Probenvolumen, was zu einem starken Anstieg des PV über 1,4 eV führt. Die Richtigkeit des vorgeschlagenen Grundes für das 1,36 eV-Merkmal in der pufferkontaktierten InAs/GaAs-Struktur und nicht der für die metamorphe angenommene wird durch Studien an Solarzellen basierend auf InAs/GaAs-Strukturen mit den unteren Kontakten auf dem n<. bestätigt /i> + -GaAs-Substrate [18, 24, 59], d. h. mit einem monotonen Band, das sich von Kontakt zu Kontakt durch die gesamte Probe biegt. Ihre PV-Spektren zeigen das gleiche Merkmal ohne eine Barriere in Bezug auf die MBE-Schicht-Grenzfläche zum Substrat. Darüber hinaus wurde in den PC-Spektren von InGaAs/GaAs-Strukturen mit lateraler Kontaktgeometrie und ohne intrinsischem Feld ein schmaler Einbruch im gleichen Spektralbereich beobachtet [10, 55].
Die PC-Spektren der Strukturen, die bei 1 V Vorspannung erhalten wurden, die wie das intrinsische Feld in den oberen Schichten der Strukturen („–“ am oberen und „+“ am unteren Kontakt) gerichtet sind, sind in Abb. 4 dargestellt. Die PC-Spektren für die mit den MBE-Schichten kontaktierten Strukturen sind den PV-Strukturen in Abb. 2 sehr ähnlich. Die Komponenten aus den QDs, WLs, InGaAs- oder GaAs-Puffern sowie n + -GaAs-Schicht werden bei den gleichen Energien beobachtet. Zu den Strukturen mit dem unteren Kontakt auf dem si -GaAs-Substrat, die PC-Spektren weisen Schwellenwerte nahe 0,72 eV in Bezug auf die Absorption des EL2-Defektzentrums auf.
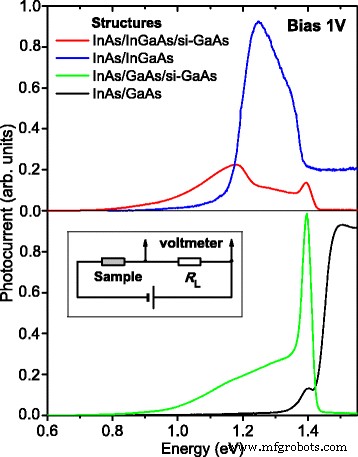
(Color online) Raumtemperatur-Photostromspektren des metamorphen InAs/In0,15 Ga0,85 Als/si -GaAs und konventionelles InAs/GaAs/si -GaAs QD-Strukturen. Einschub:Elektrisches Schema zum Anschluss der Probe für PC-Messungen
Die Merkmale der PC-Spektren für die mit den MBE-Schichten kontaktierten Strukturen in Abb. 4 entsprechen hauptsächlich denen der oben betrachteten PV-Spektren in Abb. 2. Zu den Strukturen mit dem unteren Kontakt auf dem si -GaAs-Substrat mit der EL2-Mittelkomponente besteht eine Konkurrenz zwischen dem Signal von der Absorption in den MBE-Schichten und von EL2-bezogenen Pegeln, wie oben diskutiert. Die Kurvenformen lassen jedoch den Schluss zu, dass innerhalb der Schichten über n . keine Ladungsträger angeregt wurden + -GaAs nehmen an PC teil; dies ist insbesondere für das metamorphe QD-Strukturspektrum relevant. Offensichtlich erreichen die Elektronen wegen der durch si . induzierten hohen Potentialbarriere (siehe Abb. 3) nicht den Boden -Substrat. Das Substrat hat einen zu hohen Widerstand und der Hauptabfall der angelegten Vorspannung tritt darauf auf, daher tritt keine Herabsetzung der Barriere auf.
Man kann also feststellen, dass PV und Photostrom durch das substratbedingte n . negativ beeinflusst werden + -GaAs-Schicht:Die Absorption über 1,36 eV verursacht eine drastische Signalreduzierung. Die Hauptursache für die Barriere unter dem AuGeNi-Kontakt ist die si -GaAs-Substrat mit einer eher niedrigen Positionierung des Fermi-Niveaus, was dazu führt, dass sich das Band entgegengesetzt zu dem in der Strukturoberseite verbiegt. Dies ist der einzige Effekt des Substrats, der bei einer solchen Kontaktgeometrie im PV beobachtet wird, und er zeigt sich sogar bei einer ziemlich dicken (400 nm) Zwischenschicht zwischen dem unteren Kontakt und dem Substrat.
B. Substrat-Heterostruktur-Zwischenschicht-Designlösungen
Aus praktischer Sicht kann geschlossen werden, dass ein solches Design einer InAs/InGaAs-Struktur mit si -GaAs-Substrat ist für die vertikale Entwicklung lichtempfindlicher Geräte nicht geeignet, insbesondere zusammen mit einem relativ dünnen n + -dotierter Puffer, auch wenn die Kontaktkonfiguration den Stromfluss durch das Substrat eliminiert. Die im n . gebildete Raumladungsfläche + -GaAs/Substrat-Grenzflächenbereich zwingt die hier angeregten Ladungsträger, sich entgegengesetzt zu denen zu bewegen, die in der metamorphen Struktur angeregt werden, wie in den Fign. 3 und 5a, wodurch ein entgegengesetztes PV-Signal erzeugt und die Gesamtquanteneffizienz der Probe verringert wird.
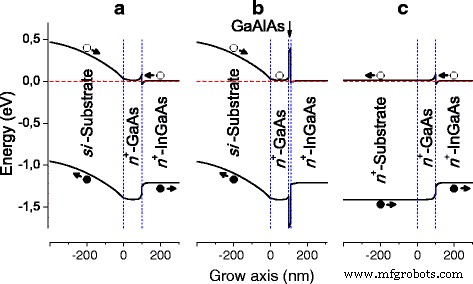
(Farbe online) berechnete Bandprofile in der Nähe von In0,15 Ga0,85 As/GaAs-Grenzflächen der metamorphen Struktur, die auf einem si . gewachsen ist -Substrat mit dem n + -GaAs-Schichtdicke von a 100 nm (aktuelle Probe), b 100 nm und ein 10 nm dünnes Ga0,3 Al0,7 Als Sperrschicht und c Struktur wie die Gegenwart, aber auf einem n . gewachsen + -Substrat dotiert ähnlich dem 100 nm dicken n + -GaAs-Schicht darüber. Die Berechnungen wurden mit der Software Tibercad durchgeführt [50]
Daher sollte bei Geräten, die auf Lichtabsorption basieren, ein anderes Strukturdesign in Betracht gezogen werden. Wir glauben, dass eine solche Verbesserung vorgeschlagen werden muss, da viele Forschungsgruppen si . betrachten -GaAs-Substrat als Basis für neuartige p -n -Typ sowohl QD-Infrarot-Photodetektoren [11,12,13] als auch Solarzellen [15].
Einfache Verdickung des n + -GaAs-Puffer unter metamorpher Struktur scheint keine sehr gute Idee zu sein. Obwohl ein solcher Puffer über 1,37 eV mehr Anregungsquanten absorbieren und die darunter liegende Grenzfläche und das Substrat abschatten könnte, muss seine Dicke sehr hoch sein, da 800 nm InGaAs-Material mit engerem Bandabstand oben nicht ausreichen, um die negativen bipolaren Effekte vollständig zu unterdrücken. Außerdem ist sogar ein sehr dickes n + -GaAs-Puffer kann den negativen Effekt der EL2-ähnlichen Zentren, die sich hauptsächlich im Substrat und nahe ihrer Grenzfläche zur MBE-Schicht befinden, nicht ausschließen. Nevertheless, as the charge carriers have a limited mean free path, thickening of the n + -GaAs layer can weaken the induced negative field on the AuGeNi contact above.
A better improvement could be provided by growing a thin barrier layer for the electrons coming from substrate like it is shown at Fig. 5b. For calculations, a 10-nm thin undoped Ga0.3 Al0.7 As barrier layer has been chosen. Such barrier could strongly confine the electrons excited in the substrate within the n + -GaAs layer. Similar high-ohmic layers grown by wide-bandgap materials as InAlAs, GaAlAs, and AlAs have been used in laser structures to avoid the charge carrier leakage from the active region of optoelectronic device [60]. However, for the case of GaAs-In0.15 Ga0.85 As based device, Ga0.3 Al0.7 As best matches due to the wide bandgap and small lattice mismatch between the epitaxial layer. Decreasing the carrier-induced field on the AuGeNi contact, it can suppress the negative effect of the substrate region on the photoresponse, especially in combination with increase in the n + -InGaAs layer thickness.
Yet, a more optimal design of the vertical structures seems to be in use of a monotonous gradient of doping, including an n + -doped GaAs substrate as it is proposed in Refs [14, 39, 40]. This design is the most efficient and at the same time simplest. If the substrate is doped similar to the capping n + -layer or heavier, this causes the band bending depicted in Fig. 5c. Furthermore, an essential advantage of such a substrate could manifest itself in solar cell design. A low-resistive substrate allows for utilization of the configuration with the “–” contact on the sample bottom [24, 38,39,40, 59], non-shadowing the MBE structure from the sunlight.
Conclusions
We have shown that photoelectrical characterization evidences a critical influence of the deep levels on the photoelectrical properties of vertical metamorphic InAs/In0.15 Ga0.85 As and pseudomorphic (conventional) InAs/GaAs QD structures in the case of electrically active si -GaAs substrate. Both nanostructures manifest a bipolar PV caused by a competition of the components originated from the oppositely sloped band profiles near the GaAs substrate and bottom MBE n + -GaAs layer on one side and the rest of MBE-grown structure on the other side. An alternative contact configuration, which allows to avoid the current flow through the bottom layers, demonstrates the unipolar PV. The last configuration together with thick buffers on substrate strongly suppresses the influence of the photoactive deep levels originated from interfaces with the si -GaAs substrate on photoelectric properties of the nanostructures. However, a notable negative indirect effect of the substrate on the photovoltage and photocurrent signal from the InAs/InGaAs structure is observed when the excitation is absorbed in the substrate and near-substrate n + -GaAs MBE layer. Analyzing the obtained results and the performed calculations, we have been able to provide insights on the design of metamorphic QD structures, which can be useful for the development of novel efficient photonic devices.
Abbreviations
- AFM:
-
Atomic force microscopy
- MB:
-
Metamorphic buffer
- MBE:
-
Molecular beam epitaxy
- ML:
-
Monolayer
- PC:
-
Photoconductivity
- PL:
-
Photoluminescence
- PV:
-
Photovoltage
- QD:
-
Quantum dot
- R L :
-
Load resistance
- si :
-
Semi-insulating
- WL:
-
Wetting layer
Nanomaterialien
- Design und Entwicklung von 5G-Geräten:5G-Leistungsbereiche
- S, N codotierte Graphen-Quantenpunkt/TiO2-Komposite für eine effiziente photokatalytische Wasserstofferzeugung
- Tauchbeschichtungsverfahren und Leistungsoptimierung für elektrochrome Drei-Zustands-Bauelemente
- Helle Einzelphotonenquelle bei 1,3 μm basierend auf InAs-Doppelschicht-Quantenpunkt in Micropillar
- Erkennen von räumlich lokalisiertem Exziton in selbstorganisierten InAs/InGaAs-Quantenpunkt-Übergittern:ein Weg zur Verbesserung der Photovoltaik-Effizienz
- Effizientes und effektives Design von InP-Nanodrähten für maximale Sonnenenergiegewinnung
- Bewertung von Graphen/WO3- und Graphen/CeO x -Strukturen als Elektroden für Superkondensatoranwendungen
- Eliminierung der bimodalen Größe in InAs/GaAs-Quantenpunkten zur Herstellung von 1,3-μm-Quantenpunktlasern
- Richtlinien für das HF- und Mikrowellendesign
- Rückschläge und Lösungen im HF-PCB-Design



