Trägerumverteilung zwischen zwei Arten von lokalisierten Zuständen in den durch Photolumineszenz untersuchten InGaN/GaN-Quantenquellen
Zusammenfassung
Die InGaN/GaN-Mehrfachquantenwannen (MQWs) werden unter den gleichen Bedingungen durch metallorganische chemische Gasphasenabscheidung (MOCVD) hergestellt, mit Ausnahme der Dicke der Deckschichten, die zusätzlich auf jeder InGaN-Wannenschicht aufgewachsen sind. Die Photolumineszenz (PL)-Intensität der dünnen Deckschichtprobe ist viel stärker als die der dickeren Deckschichtprobe. Interessanterweise weist die Probe mit der dicken Deckschicht bei hoher Anregungsleistung zwei Photolumineszenzpeaks auf, und die PL-Peak-Energie-Temperatur-Kurven zeigen einen anormalen Übergang von umgekehrt V-förmig zu regelmäßig S-förmig mit zunehmender Anregungsleistung. Unterdessen zeigt es eine schlechtere thermische Stabilität der dicken Deckschichtprobe bei höherer Anregungsleistung als bei niedrigerer Anregungsleistung. Ein solches untypisches Phänomen wird der Ladungsträgerumverteilung zwischen den zwei Arten von lokalisierten Zuständen zugeschrieben, die durch die inhomogene Verteilung der Indiumzusammensetzung in einer dicken Deckschichtprobe induziert wird. Darüber hinaus weist die Lumineszenz tiefer lokalisierter Zustände eine bessere thermische Stabilität auf, und die Lumineszenz flacher lokalisierter Zustände weist eine schlechte thermische Stabilität auf. Tatsächlich kann eine solche stärkere inhomogene Indiumverteilung durch die Verschlechterung des nachfolgenden epitaktischen Wachstums des InGaN/GaN-MQWs-Bereichs aufgrund der längeren Wachstumszeit der GaN-Deckschicht bei niedriger Temperatur verursacht werden
Die InGaN/GaN Multi-Quantum Well (MQW)-Struktur hat aufgrund ihrer breiten Verwendung in Leuchtdioden (LEDs) und Laserdioden (LDs) große Aufmerksamkeit erregt [1,2,3,4,5,6]. Obwohl die hohe Einfädelungsversetzungsdichte und die Verringerung der Wellenfunktionsüberlappung durch spontane und piezoelektrische Polarisation von InGaN/GaN-MQWs verursacht werden, ist ihre Luminanzeffizienz immer noch überraschend hoch [7,8,9,10]. Einer der Hauptgründe dafür ist, dass die Lokalisierung von Exzitonen in Potentialminima aufgrund von Fluktuationen des Indiumgehalts zur Bildung von quantenpunktartigen Zuständen in InGaN/GaN-Quantentöpfen führt [11]. Es bleibt jedoch unklar, welche Rolle die Lokalisierungszustände beim Lumineszenzmechanismus spielen. Mehrere Studien haben die Wirkung von Schwankungen der InGaN-Zusammensetzung auf Strahlungs- und Auger-Rekombinationen berichtet [12,13,14]. Theoretische Simulationen der atomistischen engen Bindung, die von Jones verwendet wurden, ergaben, dass die Lokalisierung sowohl die Strahlungs- als auch die Auger-Rekombinationsrate erhöht, aber die Auger-Rekombinationsrate um eine Größenordnung höher als die Strahlungsrekombinationsrate [15]. Experimentell führt die Ladungsträgerlokalisierung zur Lockerung der k-Selektionsregel im Auger-Rekombinationsprozess und verstärkt somit den Auger-Rekombinationsprozess in polaren InGaN/GaN-QWs unter hoher optischer Anregung stark [16]. Es ist allgemein bekannt, dass das temperaturabhängige S-förmige Verhalten der Lumineszenz-Spitzenenergie ein Fingerabdruck der Trägerlokalisierung ist. Viele Modelle, wie das Localized State Ensemble (LSE)-Modell, werden vorgeschlagen, um die Ladungsträgerlokalisierung und das thermische Umverteilungsverhalten zu erklären. 18,19,20,21]. Im Allgemeinen arbeiten die hergestellten Geräte wie Laserdioden immer mit einer höheren injizierten Ladungsträgerdichte [22]. In diesem Fall können die Photolumineszenzspektren lokalisierter Zustände ein einzigartiges Verhalten bei unterschiedlichen Anregungsniveaus zeigen, die mit der Gleichförmigkeit lokalisierter Zustände verbunden sind. Daher sind weitere Studien erforderlich, um die Auswirkungen von Legierungsschwankungen auf InGaN-Bauelemente zu verstehen.
In dieser Arbeit werden zwei typische Proben mit unterschiedlich dicken GaN-Cap-Schichten, die zusätzlich auf jeder InGaN-Wannenschicht aufgewachsen sind, durch ein metallorganisches chemisches Gasphasenabscheidungssystem (MOCVD) hergestellt. Die Eigenschaften von MQWs werden im Detail durch hochauflösende Röntgenbeugung (HRXRD), temperaturabhängige Photolumineszenz (TDPL) und leistungsabhängige Photolumineszenz (PDPL) charakterisiert. Es wurde festgestellt, dass die Probe der dicken Deckschicht bei hoher optischer Anregungsleistung einen anomalen Peak auf der Seite höherer Energie zeigt. Dies impliziert eine Koexistenz von zwei verschiedenen Arten von lokalisierten Zuständen. Währenddessen nimmt die PL-Intensität bei niedrigen Temperaturen schneller ab, wenn die Anregungsleistung höher wird. Daher können wir davon ausgehen, dass die Photolumineszenz tiefer lokalisierter Zustände eine bessere thermische Stabilität aufweist und die Photolumineszenz flacher lokalisierter Zustände eine schlechte thermische Stabilität.
Die InGaN/GaN-MQW-Proben mit unterschiedlicher Deckschichtdicke, die auf einem C-Plane-Saphir-Substrat von einem AIXTRON 3 × 2 in einem eng gekoppelten Showerhead-Reaktor aufgewachsen sind, werden untersucht. Trimethylgallium (TMGa), Trimethylindium (TMIn) und Ammoniak (NH3 .) ) wurden für das epitaktische Wachstum als Ga-, In- bzw. N-Source-Vorläufer verwendet, in denen H2 und N2 waren das Trägergas des GaN- bzw. InGaN-Wachstums. MQW besteht aus zwei Perioden von InGaN/GaN-QWs. Während des Wachstums jeder Well-Schicht wurde die TMIn-Flussrate konstant gehalten. Dann wurde eine GaN-Deckschicht bei der gleichen Temperatur wie die Muldenschicht aufgewachsen, d. h. 710 °C. Danach wurde die Temperatur auf 830 °C hochgefahren und mehrere Sekunden gehalten, und dann wurde die Sperrschicht bei 830 °C gezüchtet. Beide Proben A und B werden unter den gleichen Bedingungen gezüchtet, mit Ausnahme der Wachstumszeit der GaN-Deckschicht, dh sie beträgt 30 s für Probe A und 200 s für Probe B. Das schematische Diagramm der Struktur und der Wachstumsparameter von zwei InGaN/GaN-MQWs A und B sind in Abb. 1 dargestellt.
Das schematische Querschnittsdiagramm der Epischichtstrukturen von zwei MQWs
Um den durchschnittlichen Indiumgehalt, die Periodendicke und die Materialqualität von zwei InGaN/GaN-MQWs zu bestimmen, wird eine hochauflösende Röntgenbeugungsmessung (HRXRD) mit Rigaku Ultima IV mit Cu-Ka-Strahlung (λ = 1,54 Å) durchgeführt, die betrieben wurde bei 40 kV und 30 mA. Für temperaturabhängige Photolumineszenz (TDPL)- und anregungsleistungsabhängige PL (PDPL)-Messungen wurde ein 405 nm-Laser als Anregungslichtquelle mit einer Spotgröße von 0,5 mm
2
. verwendet , und die Anregungsleistung variierte von 0,01 bis 50 mW. Die Proben wurden in einen He-Kryostat mit geschlossenem Kreislauf eingebaut und die Temperatur wurde auf 10 bis 300 K geregelt.
Um die strukturellen Eigenschaften von zwei Proben A und B zu untersuchen, wurden die ω-2θ-symmetrischen (0002) Scans durchgeführt, wie in Abb. 2a gezeigt. Der Substratpeak stammt von der GaN(002)-Ebene, und Satellitenpeaks stammen von MQWs. In allen beiden Proben sind deutlich Satellitenpeaks bis zur vierten Ordnung zu erkennen, was auf eine gute Schichtperiodizität hindeutet. Darüber hinaus können die durchschnittliche Indiumzusammensetzung und die periodische Dicke durch Anpassen der gemessenen Kurven erhalten werden, wie in Tabelle 1 gezeigt. Es ist ersichtlich, dass mit zunehmender Dicke der Deckschicht die Dicke der GaN-Barriere und die Dicke und Indiumzusammensetzung von InGaN Brunnenschichten nehmen leicht zu. Da die Wachstumsrate der Deckschicht nur 0,006 nm/s beträgt und die Wachstumstemperatur nur 710 K beträgt, ist die Änderung der Barrierendicke relativ gering. Es ist jedoch anzumerken, dass das Wachstum zusätzlicher GaN-Deckschichten nicht nur Einfluss auf die Dicke der Barriereschicht haben kann, sondern auch auf die Diffusion, Verdampfung und Umverteilung von In-Atomen in den InGaN-Wannenschichten, wie später ausführlich erörtert wird.
Omega-2theta-Scans und reziproke Raumkartierung beider Proben werden von HRXRD durchgeführt. a HRXRD Omega-2theta-Kurven auf der GaN(0002)-Ebene für die Proben A und B. b Reziproke Raumabbildung (RSM) für die GaN (10–15) Beugung der Probe A
Um den Spannungszustand von GaN-QB- und InGaN-QW-Schichten zu untersuchen, wird eine reziproke Raumabbildung (RSM) in der Nähe der GaN-Ebene (10–15) durchgeführt. Das Ergebnis von Probe A ist in Abb. 2b gezeigt (die RSM-Zahl von B ist ähnlich, aber hier nicht gezeigt). Wir können beobachten, dass für Probe A die Satellitenpeaks von MQW und GaN-Peak gut auf derselben vertikalen Linie ausgerichtet sind, was darauf hindeutet, dass die MQWs beider Proben ohne jegliche Relaxation vollständig gespannt sind [23].
Abbildung 3 zeigt die PDPL-Messungen für zwei Proben bei 10 K. Interessant ist, dass die beiden Proben ein recht unterschiedliches Verhalten zeigen. Für Probe A gibt es einen kleinen Peak auf der Seite niedrigerer Energie (Peak A 1 ) des dominanten Peaks A 2 . Es wird bestätigt, dass Peak A 1 ist eine Phononenreplik, die 92 meV vom Hauptpeak A . entfernt ist 2 . Die Phononen-Nachbildung von B 2 erscheint auch in Probe B und wird als Peak B bezeichnet 1 . Auf der anderen Seite ist in Abb. 3b zu sehen, dass es nur einen dominanten Lumineszenzpeak B . gibt 2 mit einer Anregungsleistung von weniger als 5 mW. Wenn die Anregungsleistung jedoch höher als 10 mW ist, wird ein weiterer Spitzenwert B 3 erscheint abnormal auf der höheren Energieseite von B 2 , und Peak B 3 wird allmählich zum dominanten Emissionspeak anstelle von Peak B 2 wenn die Erregerleistung weiter ansteigt. Hier können wir annehmen, dass die Mehrheit der optisch angeregten Ladungsträger zuerst in der ersten Art von elektronischen Zuständen gefangen wurde (zB lokalisierte Zustände, die von den lokalen In-reichen Clustern erzeugt werden) und dann strahlend rekombinieren, wodurch ein Lumineszenzpeak A . entsteht 2 und B 2 . [24].
PL-Spektren der Proben A (a ) und B (b ) bei mehreren unterschiedlichen Anregungsleistungen, gemessen bei Temperaturen von 10 K
Um das Verhalten des anomalen Peaks B . zu untersuchen 3 von Probe B haben wir die TDPL-Messungen unter verschiedenen Anregungsleistungen durchgeführt, die in Abb. 4 gezeigt sind, wobei Abb. 4a und b die PL-Spektren sind, die bei einer Anregungsleistung von 5 mW bzw. 40 mW erhalten wurden. Beachten Sie, dass das Zwei-Peak-Phänomen der Emissionsspektren in Abb. 4b bei Temperaturen unter 200 K deutlich zu sehen war und gegen 300 K hin verschwommen wurde eine hohe Energieemissionsspitze tritt in einem engen Bereich der Anregungsleistung auf und hat einen „schaltenden“ Charakter. Außerhalb des schmalen Übergangsbereichs, einzelne niedrige Energie (B 2 ) oder hohe Energie (B 3 ) dominiert der Emissionspeak bei niedrigen bzw. hohen Anregungsleistungen.
PL-Spektren von Probe B im Temperaturbereich von 10–300 K, gemessen bei Anregungsleistungen von 5 mW (a ) und 40 mW (b )
Darüber hinaus können wir bei genauerer Betrachtung der Variation der dominanten Emissionspeakenergie mit der Temperatur beider Proben etwas Einzigartiges finden. Wie in Abb. 5a gezeigt, zeigt die Variation der PL-Spitzenenergie mit steigender Temperatur (im Folgenden als ET-Kurve bezeichnet) bei einer Erhöhung der Anregungsleistung von 5 auf 40 mW für Probe A Kurven mit "umgekehrter V-Form", die sich von den regulären unterscheiden „S“-Form. Die umgekehrte V-Form bleibt mit zunehmender Anregungsleistung fast unverändert, mit Ausnahme einer allgemeinen Blauverschiebung der Spitzenenergie. Die umgekehrte „V“-förmige Temperaturabhängigkeit wird als gemeinsame Wirkung von Trägerfülleffekt an Lumineszenzzentren und Bandlückenschrumpfeffekt bei steigender Temperatur erklärt [25, 26]. Andererseits zeigen, wie in Fig. 5b gezeigt, die E-T-Kurven für Probe B bei einer Anregungsleistung von weniger als 5 mW eine umgekehrte V-Form. Diese Situation ähnelt der von Probe A. Wenn die Anregungsleistung jedoch allmählich auf 40 mW ansteigt, tritt im unteren Temperaturbereich eine erste Rotverschiebung auf und die E-T-Kurven haben eine regelmäßige S-Form. Anscheinend widerspricht dieses Phänomen der Erwartung, dass bei einer ausreichend großen Anregungsleistung der Lokalisierungseffekt vollständig verschwindet und das Temperaturverhalten der Spitzenenergie eng dem Varshni-Gesetz folgt [27].
PL-Emissionsspitzenenergie als Funktion der Temperatur für Proben A (a ) und B (b ) bei unterschiedlichen Erregerleistungen. Die durchgezogenen Linien sind theoretische Anpassungskurven unter Verwendung des LSE-Modells. Die Punkte sind die Versuchsdaten
Um die beobachtete anomale angeregte optische Leistungsabhängigkeit der Lumineszenz lokalisierter Zustände quantitativ zu erklären, wurde daher das LSE-Lumineszenzmodell verwendet, um die E-T-Kurven anzupassen, das von Q. Li et al. vorgeschlagen wurde. Dieses Modell kann in allen Temperaturbereichen verwendet werden und kann nicht nur die E-T-Kurven der „S“-Form, sondern auch die „V“- oder umgekehrten „V“-Formen anpassen. Darüber hinaus konnte auch nachgewiesen werden, dass das LSE-Modell bei hohen Temperaturen auf das Band-Tail-Modell von Eliseev et al. reduziert werden kann [24, 25]. In diesem Modell kann die Spitzenenergie als Funktion der Temperatur beschrieben werden als [18,19,20,21]:
wo θ ist die Debye-Temperatur des spezifischen Materials und a ist der Varshni-Parameter, k B ist die Boltzmann-Konstante und x kann numerisch durch die folgende transzendente Gleichung [18,19,20,21] gelöst werden:
wo σ ist die Standardabweichung der Verteilung der lokalisierten Zustände. Mit anderen Worten, es bedeutet die Breite der Zustandsdichteverteilung vom Gauß-Typ. τ r und τ tr repräsentieren die strahlende Rekombination und die Escape-Lebensdauer des lokalisierten Trägers und somit τ r /τ tr impliziert den Anteil der Träger, der strahlungslos rekombiniert. E 0 ist die zentrale Energie der lokalisierten Zentren und E a gibt ein „Markierungsniveau“ an, unterhalb dessen alle lokalisierten Zustände von Trägern bei 0 K besetzt sind, was genau wie das Quasi-Fermi-Niveau in der Fermi-Dirac-Verteilung ist. Es ist offensichtlich, dass E 0 und E a zusammen hängen mit dem Ursprung der lokalisierten Lumineszenzzentren zusammen [17].
Die erhaltenen Anpassungsparameter beider Proben sind in Tabelle 2 aufgeführt. Für Probe A ist die zentrale Energie E 0 und E a ändert sich von 5 auf 40 mW auf 19 meV bzw. 18 meV. Es wird bemerkt, dass das E 0 -E a und σ ist fast unverändert. Dies liegt daran, dass mit zunehmender Anregungsleistung immer mehr Träger angeregt werden. Zuerst wird das starke piezoelektrische Feld der InGaN-Wells durch die photogenerierten Ladungsträger abgeschirmt, was zu einer Erhöhung der zentralen Energie E . führt 0 . Zweitens werden immer mehr Ladungsträger entsprechend dem Fülleffekt höhere elektronische Zustände einnehmen, was zu einer Erhöhung des Quasi-Fermi-Niveaus lokalisierter Ladungsträger führt E a . Daher E 0 -E a stellt die gemeinsame Wirkung des Polarisationsabschirmungseffekts und des Ladungsträgerfülleffekts dar, und somit wird eine Gesamtblauverschiebung der Peakposition für Probe A beobachtet. Im Gegensatz zu Probe A gibt es bei Probe B von 5 auf 40 mW einen größeren Anstieg von E 0 und E a , 73 meV bzw. 57 meV. E 0 -E a um 16 meV erhöhen, τ r /τ tr Änderungen um mehrere Größenordnungen und σ nimmt etwas ab. Solche Änderungen sind so groß, dass wir davon ausgehen müssen, dass die Entstehung der Lumineszenzzentren bei verschiedenen Anregungsleistungen von 5 mW und 40 mW unterschiedlich ist.
Daher wird vorgeschlagen, dass es für Probe B zwei Arten von Lokalisierungszuständen gibt, die sich aufgrund der inhomogenen Verteilung der Indiumzusammensetzung in zwei unterschiedlichen Energietiefen in den Wannenschichten verteilen, dh mit höherer Indiumzusammensetzung (tiefe Lokalisierungszustände) und niedrigeren Indiumzusammensetzung (flache Lokalisierungszustände). Um das obige Phänomen von Probe B zu erklären, sind außerdem die schematischen Diagramme, die den möglichen Mechanismus der Ladungsträgerumverteilung zwischen zwei Arten von lokalisierten Zuständen zeigen, in Fig. 6 aufgetragen. Bei 10 K, unter niedrigerer Anregungsleistung wie 5 mW, gezeigt in Abb. 6a wird die Mehrheit der optisch angeregten Ladungsträger zuerst in der ersten Art von elektronischen Zuständen (tiefe lokalisierte Zustände) gefangen, und daher dominiert der niedrigere Energiepeak, während bei 40 mW, gezeigt in Abb. 6b, mehr und mehr photogeneriert wird Ladungsträger werden das höhere Energieniveau besetzen, und dann werden auch die flachen lokalisierten Zustände mit der höheren Energiezustandsdichte gefüllt, und somit dominiert der höhere Energiepeak allmählich mit der Zunahme der angeregten Leistung. Daher E 0 und E a stark zunehmen und τ r /τ tr Erhöhung um mehrere Größenordnungen, die die Fluchtfähigkeit von Trägern aus lokalisierten Staaten implizieren. Wenn die Temperatur auf 30 K ansteigt, werden bei 5 mW, wie in Fig. 6c gezeigt, die photogenerierten Träger mit einer bestimmten Menge an thermischer Energie hauptsächlich zum Füllen der tieferen lokalisierten Zustände verwendet, was zu einer ersten Blauverschiebung der E-T-Kurven führt; In Abb. 6d bleibt jedoch, wenn es um 40 mW geht, basierend auf der Annahme, dass flach lokalisierte Zustände mehr Kapazität haben als die tiefen lokalisierten Zustände, die Mehrheit der photogenerierten Ladungsträger in flach lokalisierten Zuständen und kann übertragen werden in tiefe lokalisierte Zustände, die eine starke Fähigkeit haben, Träger zu binden. Daher sind die ET-Kurven rotverschoben. Mit anderen Worten, das Auftreten abnormaler Veränderungen der ET-Kurven betrifft mehrere Arten von Lokalisierungszuständen aufgrund der inhomogenen Indiumverteilung in den InGaN-Wannenschichten von Probe B. Und solche Zusammensetzungsschwankungen sollen hauptsächlich auf die zufälligen Legierungsschwankungen auf an . zurückzuführen sein atomare Skala [28].
Schematische Diagramme, die den möglichen Mechanismus der anomalen Variation der PL-Spitzenenergie vs. T-Kurven mit unterschiedlichen Anregungsleistungen zeigen. Die Trägerverteilungen bei niedrigerem T (10 K) sind in (a .) dargestellt ) und (b ) für P = 5 mW bzw. 40 mW. Die Trägerverteilungen bei höheren T (30 K) sind in (c .) dargestellt ) und (d ) für P = 5 bzw. 40 mW
Darüber hinaus führt das Auftreten eines hochenergetischen Emissionspeaks bei hoher Anregungsleistung von Probe B auch zu einer anomalen Variation der integrierten PL-Intensität. In Abb. 7 sind die integrierten Intensitäts-Temperatur-Kurven der Proben A und B, gemessen bei Anregungsleistungen von 5 mW bzw. 20 mW, aufgetragen. Beachten Sie zunächst, dass die thermische Löschung von Probe B offensichtlich schneller ist als die von Probe A. Im Allgemeinen wird die thermische Lumineszenzlöschung der InGaN-MQWs von den strahlungslosen Rekombinationsprozessen dominiert, die durch die Arrhenius-Gleichung beschrieben werden können. Daher impliziert das schnelle thermische Quenchen eine schlechte thermische Stabilität von Probe B. Wenn die Anregungsleistung hoch genug ist, ist der Einfluss nichtstrahlender Rekombinationszentren bei relativ niedrigen Temperaturen außerdem nicht so signifikant, da die nichtstrahlenden Rekombinationszentren leicht gesättigt werden durch Überschussträger [27]. Dies kann die langsamere Variation der PL-integrierten Intensität vs. 1/T-Kurven mit der Zunahme der Anregungsleistung von Probe A perfekt erklären. Es ist jedoch für Probe B sehr interessant, dass die normalisierte integrierte Intensität bei einer Anregungsleistung von 5 mW noch höher ist als unter 20 mW, wenn die Temperatur niedriger als 125 K ist, und es wird umgekehrt bei Temperaturen über 125 K. Wie bereits erwähnt, wird angenommen, dass nur ein niedrigerer Energieemissionspeak, der aus tiefen lokalisierten Zuständen stammt, dominant ist bei 5 mW, während ein anderer höherer, der aus flachen lokalisierten Staaten stammt, bei 20 mW dominant wird. Daraus wird geschlossen, dass die tiefen lokalisierten Lumineszenzzentren eine bessere Lumineszenzeffizienz aufweisen als flache Lumineszenzzentren. Dies stimmt gut mit den bisherigen Forschungsergebnissen zu den lokalisierten Zuständen überein [28]. Daher kann bis zu einem gewissen Grad auch bewiesen werden, dass es für Probe B zwei Arten von lokalisierten Zuständen gibt, die bei 20 mW angeregt werden.
Die integrierte Intensität aus den PL-Spektren beider Proben bei einem Temperaturbereich von 10–300 K, gemessen bei Anregungsleistungen von 5 mW und 20 mW
Basierend auf all diesen Analysen zeigen wir, dass Peak B 3 stammt aus den Lokalisierungszuständen mit niedrigerem Potential, die mit der inhomogenen Verteilung der Indiumzusammensetzung von Probe B zusammenhängen. Es stimmt gut mit den experimentellen Ergebnissen des höheren Emissionsenergiepeaks B . überein 3 und die Verringerung des IQE von Probe B bei niedrigen Temperaturen unter höherer Anregungsleistung. Tatsächlich neigen Indiumatome beim Wachstumsprozess von QWs unter Berücksichtigung der Zieheffekte dazu, sich oben auf der InGaN-QW-Schicht anzusammeln und eine zusätzliche Schicht zu bilden, die als Indium-Floating-Schicht bekannt ist [29]. Das Wachstum einer dickeren GaN-Deckschicht bei niedriger Temperatur ist schädlich für die Verdampfung dieser schwebenden Indiumatome. Folglich können In-Atome nach dem QW-Wachstum in die GaN-Deckschicht und die Barriereschicht eingebaut werden [30]. Dieses Verhalten führt natürlich zu einer Zunahme der Dicke der Wannenschicht und somit wird die QCSE verbessert. Die höhere Dehnung und das stärkere piezoelektrische Feld im aktiven QW würden eine stärker lokalisierte Relaxation und damit tiefere lokalisierte Potentiale und höhere Barrieren induzieren. In der Zwischenzeit werden mehr Versetzungen und Defekte in das anschließende Wachstum der GaN-Barriereschicht eingeführt. Im Allgemeinen gibt es in der Nähe von Versetzungen eine große Zugspannung, und Indiumatome können dazu neigen, sich in der Nähe der Versetzungen anzusammeln und sich inhomogen zu verteilen. [31, 32] Daher gibt es beim Wachstum von InGaN-Wannenschichten mehr indiumreiche und indiumarme Bereiche, die mit der zunehmenden Versetzungsdichte verbunden sind. Dies bedeutet, dass das Ausmaß der Indiumfluktuationen mit zunehmender Dicke der Deckschicht größer wird. In unseren Experimenten zeigt sich, dass in Probe B mit dickerer Deckschicht zwei verschiedene Arten von Lokalisierungszuständen eingeführt werden und der PL-Peak mit höherer Emissionsenergie bei höherer Anregungsleistung aktiviert wird. Auf der anderen Seite kann der photogenerierte Ladungsträgeraufenthalt in tiefen lokalisierten Zuständen die Defekte abschirmen und hat somit eine bessere thermische Stabilität, während der photogenerierte Ladungsträgeraufenthalt in flachen lokalisierten Zuständen von der defektbezogenen nichtstrahlenden Rekombination eingefangen wird, sobald sie die relativ niedrigere Barrierehöhe.
Zusammenfassend werden die InGaN/GaN-Multi-Quantum-Well-(MQW)-Proben mit unterschiedlichen Dicken von zusätzlich auf den InGaN-Wellschichten aufgewachsenen GaN-Deckschichten durch ein metallorganisches chemisches Gasphasenabscheidungssystem (MOCVD) hergestellt. Ihre strukturellen und optischen Eigenschaften werden durch HRXRD-, TDPL- und PDPL-Messungen untersucht und analysiert. PDPL-Ergebnisse zeigen, dass nur für Probe B, die mit dicken Deckschichten aufgewachsen ist, ein zusätzlicher hochemissionsenergiepeak bei höherer Anregungsleistung angeregt wird. Unterdessen zeigen TDPL-Ergebnisse, die bei verschiedenen Anregungsleistungen für Probe B gemessen wurden, dass sich die E-T-Kurven des dominanten PL-Peaks von der umgekehrten V-Form zu einer regulären S-Form ändern, wenn die Anregungsleistung zunimmt. Außerdem wurde eine schlechtere thermische Stabilität von Probe B bei hoher Anregungsleistung festgestellt. Diese anomalen Phänomene implizieren, dass es zwei Arten von lokalisierten Zuständen der Probe B gibt, die durch die relativ inhomogene Indiumverteilung induziert werden. Diese Schlussfolgerungen geben uns ein weiteres Verständnis des Photolumineszenzmechanismus grüner InGaN/GaN-Quantentöpfe und des Inhomogenitätseffekts bei hohem Anregungsniveau, was uns bei der Herstellung von InGaN/GaN-Laserdioden helfen könnte.
Hochauflösende Röntgenbeugung
Laserdioden
Leuchtdioden
Lokalisiertes staatliches Ensemble
Metall-organisches chemisches Gasphasenabscheidungssystem
Multi-Quanten-Wells
Ammoniak
Leistungsabhängige Photolumineszenz
Reziproke Raumzuordnung
Temperaturabhängige Photolumineszenz
Trimethylgallium
TrimethylindiumEinführung
Methoden
Materialien
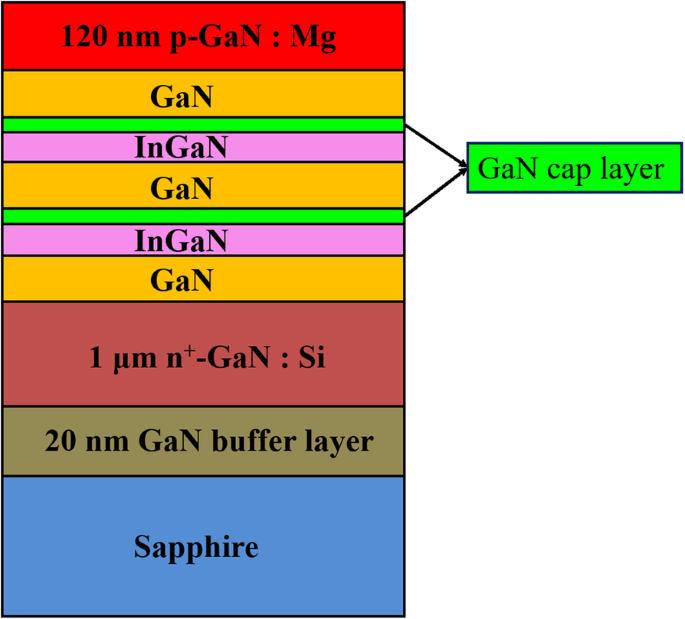
Charakterisierung
Ergebnisse und Diskussionen

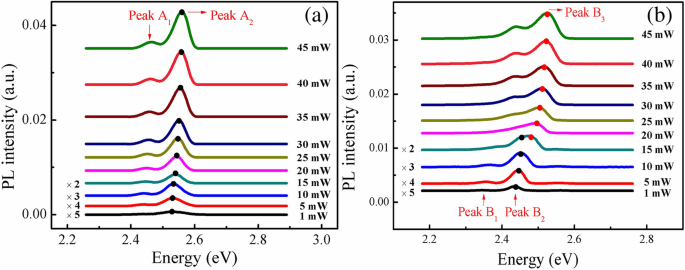
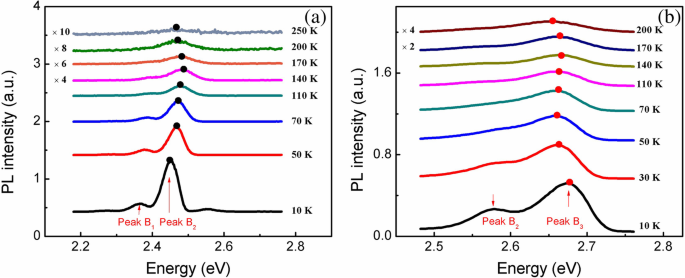


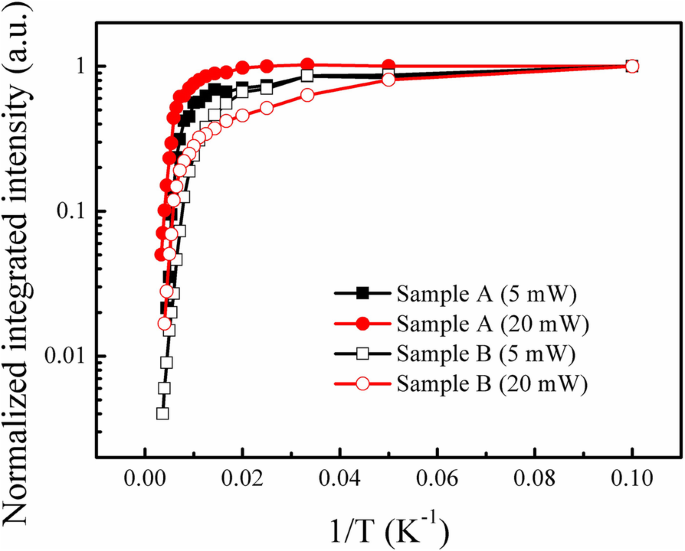
Schlussfolgerungen
Abkürzungen
Nanomaterialien
- Die atomare Umlagerung von GaN-basierten mehreren Quantenquellen in H2/NH3-Mischgas zur Verbesserung der strukturellen und optischen Eigenschaften
- Das Design der Emissionsschicht für Elektronenvervielfacher
- Mehrfarbige Emission von ultravioletter GaN-basierter photonischer Quasikristall-Nanopyramidenstruktur mit semipolaren InxGa1−xN/GaN-Mehrfachquantenquellen
- Erkennen von räumlich lokalisiertem Exziton in selbstorganisierten InAs/InGaAs-Quantenpunkt-Übergittern:ein Weg zur Verbesserung der Photovoltaik-Effizienz
- Wismut-Quantenpunkte in geglühten GaAsBi/AlAs-Quantenbrunnen
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs
- Untersuchung einer kristallinen Silizium-Solarzelle mit schwarzer Siliziumschicht auf der Rückseite
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster



