Dominanter Einfluss der Streuung der Grenzflächenrauheit auf die Leistung von GaN-Terahertz-Quantenkaskadenlasern
Zusammenfassung
Der Einfluss der Grenzflächenrauhigkeit von Quantentöpfen, unbeabsichtigter Dotierung und Legierungsfehlordnung auf die Leistung von GaN-basierten Terahertz-Quantenkaskadenlasern (QCL) wurde durch den Formalismus der Nichtgleichgewichts-Green-Funktionen untersucht. Es wurde festgestellt, dass der Einfluss der Legierungsstörung auf die optische Verstärkung vernachlässigbar ist und eine unbeabsichtigte Dotierung unter einer vernünftigen Konzentration von 10 17 . bleiben sollte cm −3 um eine Zersetzung durch Streuung von Elektronenverunreinigungen und eine Absorption freier Träger zu verhindern. Noch wichtiger ist, dass die Streuung der Grenzflächenrauheit der dominierende Faktor bei der Verschlechterung der optischen Verstärkung ist. Daher ist seine genaue Kontrolle während der Herstellung von entscheidender Bedeutung. Schließlich ein Gewinn von 60 cm −1 kann bei 300 K erhalten werden, was die Möglichkeit der Herstellung von GaN Terahertz QCL bei Raumtemperatur zeigt.
Einführung
Der Terahertz (THz)-Spektralbereich ist aufgrund seiner Anwendungsmöglichkeiten in der Qualitäts- und Sicherheitskontrolle, medizinischen Diagnose und Telekommunikation Gegenstand intensiver Forschung. Seine Entwicklung wurde jedoch durch den Mangel an verfügbaren kompakten Geräten behindert. Der Quantenkaskadenlaser (QCL) ist ein vielversprechender Kandidat für die Entwicklung leistungsstarker THz-Festkörperquellen [1, 2]. Die bisher beste THz-QCL basiert auf GaAs, dessen maximale Betriebstemperatur aufgrund der niedrigen LO-Phononenenergie (36 meV) von GaAs etwa 200 K beträgt [3, 4]. Mit Hilfe eines Magnetfeldes kann diese Temperatur auf bis zu 225 K angehoben werden, diese Methode ist jedoch für weit verbreitete Anwendungen ungeeignet [5, 6]. Wenn die Temperatur ansteigt, können Elektronen im Zustand des oberen Niveaus genügend thermische Energie aufnehmen, um strahlungsfreie Relaxationen durch LO-Phonon-Emission in Richtung des Zustands des unteren Niveaus zu aktivieren, wodurch die Besetzungsinversion zerstört wird. Im Vergleich zu GaAs hat GaN eine viel höhere LO-Phonon-Energie (92 meV) und bietet somit die Möglichkeit, THz-QCL bei Raumtemperatur zu erzeugen [7,8,9]. Darüber hinaus können GaAs-basierte QCLs aufgrund ihres Reststrahlen-Bandes, dem Spektralbereich, in dem das Material aufgrund der Absorption durch optische Phononen vollständig lichtundurchlässig ist, nicht im Frequenzbereich von 4,6–12 THz betrieben werden. Die größere Energie optischer Phononen in GaN eröffnet Perspektiven für THz-Quantenkaskadengeräte, die in einem viel breiteren Spektralbereich zwischen 1 und 15 THz arbeiten können.
Der erste Studienschritt bei GaN-THz-QCLs war die Abstimmung des Intersubband-(ISB)-Übergangs zum Ferninfrarotbereich. Die ISB-Absorption bei THz-Frequenzen wurde in polaren [10, 11] und unpolaren Quantentrogs (QWs) auf Nitridbasis [12,13,14,15,16,17] beobachtet. THz-betriebene ISB-GaN-basierte Detektoren wurden bei 13 THz [18] bzw. 10 THz [19] demonstriert. Bisher wurde noch kein Elektrolumineszenz-Nachweis in diesem Bereich erreicht, mit Ausnahme einiger umstrittener Berichte der Hirayama-Gruppe über die spontane Elektrolumineszenz einer QCL-Struktur [20, 21]. Es wurden mehrere theoretische Studien veröffentlicht [7, 9, 22,23,24,25,26], darunter einige limitierende Faktoren der GaN-THz-QCL-Leistungen wie die Verstärkungsspektrumsverbreiterung aufgrund sehr starker Wechselwirkungen zwischen Elektronen und LO-Phononen in GaN [23].
In diesem Artikel schlagen wir vor, diese Studien durch die Analyse anderer Faktoren abzuschließen, die die optische Verstärkung von THz GaN QCL beeinträchtigen können, wie z. B. Grenzflächenrauigkeit von Quantentöpfen, nicht beabsichtigte Dotierung und Legierungsstörung. Es wurde festgestellt, dass der Einfluss der Legierungsstörung auf die optische Verstärkung vernachlässigbar ist und eine unbeabsichtigte Dotierung unter einer vernünftigen Konzentration von 10 17 . bleiben sollte cm −3 um eine Zersetzung durch Streuung von Elektronenverunreinigungen und eine Absorption freier Träger zu verhindern [27]. Schließlich haben wir festgestellt, dass die Streuung der Grenzflächenrauheit der dominierende Faktor bei der Verschlechterung der optischen Verstärkung ist. Und ein Gewinn von 60 cm −1 kann bei 300 K erreicht werden, was deutlich über dem theoretischen Verlust eines Doppelmetallwellenleiters liegt, was die Möglichkeit der Herstellung von GaN THz QCL bei Raumtemperatur zeigt.
Methoden
Es ist bekannt, dass bei der Herstellung von GaN-THz-QCL-Bauelementen dicke aktive Bereiche mit geringen Versetzungsdichten wachsen müssen. Diese Aufgabe ist wegen der Gitterfehlanpassung zwischen GaN und AlGaN herausfordernd [28]. Andere unerwünschte Faktoren, die von der Epitaxie herrühren, können ebenfalls auftreten:Grenzflächenrauhigkeit (IFR) in Abhängigkeit von den Wachstumsbedingungen, nicht beabsichtigte n-Dotierung (nid) aufgrund von Verunreinigungen (hauptsächlich Sauerstoff) Einbau während des Wachstums und Legierungsstörung (AD) aufgrund von Ga-Oberfläche Segregation und Al-Adatom geringe Mobilität. Um zu untersuchen, wie diese Phänomene die THz-GaN-QCL-Leistung beeinflussen, verwenden wir den Formalismus der Nichtgleichgewichts-Green-Funktionen (NEGF). Die Berechnungen werden mit der Nextnano QCL-Software durchgeführt [29,30,31]. Dieses Modell umfasst Relaxation, die durch Grenzflächenrauheit, ionisierte Verunreinigungen, Legierungsfehlordnung, LO-Phonon, akustisches Phonon oder Elektron-Elektron-Wechselwirkung induziert wird. Wir verwendeten einen QCL mit drei Quantenmulden und einem Resonanz-Phononen-Entvölkerungsschema, da dieses THz-QCL-Design die bisher höchste Betriebstemperatur bietet [3, 32]. 1a zeigt die entworfene aktive Regionsstruktur. Die Schichtenfolge für eine AlGaN-Quantenstruktur/AlGaN-Quantenstruktur beträgt 1,6 /6.2/1.6 /3.4/1.0 /3.4 nm, wobei die kursiven die Dicke der Barrieren zeigen. Abbildung 1b zeigt das Leitungsbanddiagramm der entworfenen QCL-Struktur bei einer Vorspannung von − 84.5 kV/cm. Aus der vorhergehenden Periode rechts werden Elektronen durch resonantes Tunneln in den oberen Laserzustand, gekennzeichnet mit 1, injiziert. Dann durchlaufen sie einen strahlenden Übergang in den unteren Laserzustand 2. Dieser untere Laserzustand wird durch Tunneln in den Zustand 3 entvölkert. Schließlich relaxieren Elektronen durch LO-Phononen-Emission in den Zustand 4 durch. Der Vorgang wird für jede Periode wiederholt.
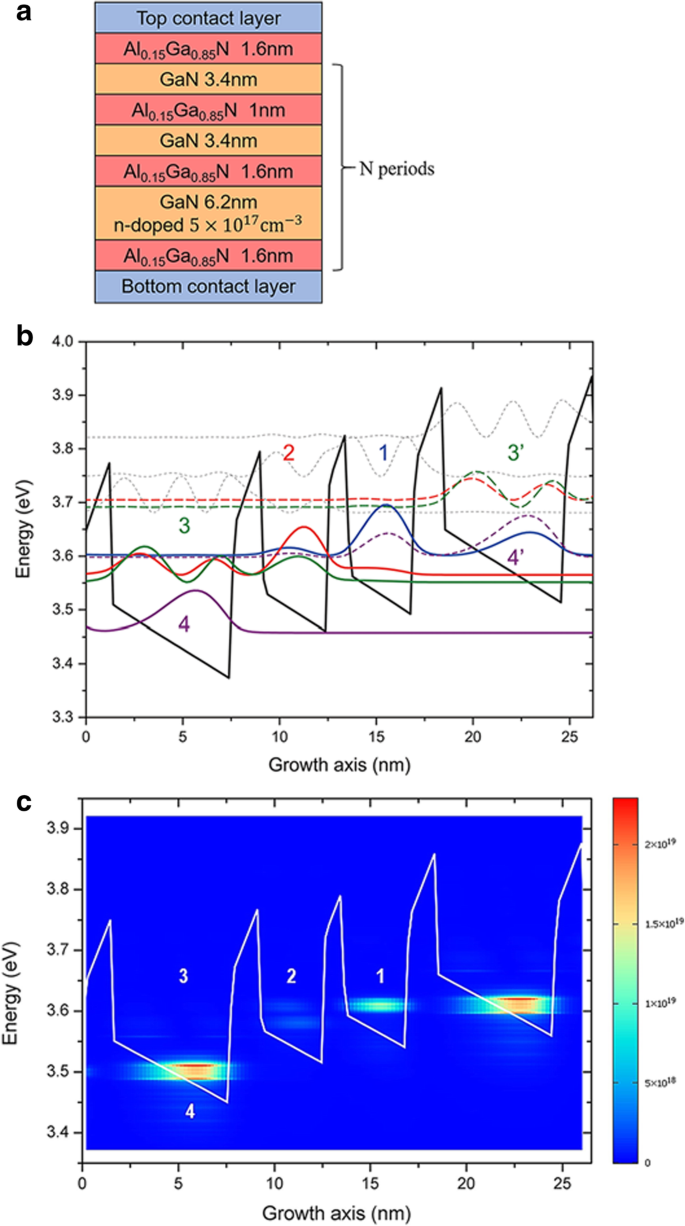
Entworfene aktive Regionsstruktur, Leitungsbandprofil, quadrierte Hüllkurvenfunktionen und Ladungsträgerdichten. a Die Schichtenfolge für eine Periode ist 1.6 /6.2/1.6 /3.4/1.0 /3,4 nm. Barrieren sind in kursiver Schrift gekennzeichnet. Die 6,2 nm dicke Wanne ist n-dotiert mit n = 5 × 10 17 cm −3 . b Leitungsbandprofil und quadrierte Hüllkurvenfunktionen von GaN/Al0,15 Ga0,85 N QCL in dieser Studie berücksichtigt. Es wird ein elektrisches Feld von − 84,5 kV/cm angelegt. c Trägerdichten und Leitungsband der QCL berechnet im NEGF-Modell. Das angelegte elektrische Feld beträgt – 84,5 kV/cm. Die Temperatur ist auf 10 K eingestellt.
Bei der Berechnung verwenden wir die Parameter, die normalerweise in GaN/AlGaN-gewachsenen Strukturen mit plasmaunterstützter Molekularstrahlepitaxie (PAMBE) gefunden werden:eine Grenzflächenrauhigkeit von 0,25 nm [33] mit einer Korrelationslänge von 1 nm und einem nicht beabsichtigten n- Dotierung mit einer Ladungsträgerkonzentration von 10 17 cm −3 . Die Streuung von Legierungsfehlordnungen ist ebenfalls in der Simulation enthalten.
Ergebnisse und Diskussion
Abbildung 1c zeigt die berechneten Ladungsträgerdichten dieser Struktur bei einer Betriebsspannung von − 84.5 kV/cm. Wir haben das Anti-Crossing zwischen der vorherigen Periode und dem oberen Laserzustand 1 beobachtet. Wir sehen auch, dass der untere Laserzustand 2 in den Zuständen 3 und 4 durch resonantes Phonon entvölkert wird. Um den Einfluss von IFR zu analysieren und zu vergleichen, nid, und AD haben wir unsere optische GaN THz QCL-Verstärkung und Stromcharakteristik für mehrere Konfigurationen berechnet:die Referenzkonfiguration unter Berücksichtigung von IFR, nid und AD, eine Konfiguration ohne IFR, eine andere ohne nid und eine letzte ohne AD. Abbildung 2 zeigt die maximale optische Verstärkung gegenüber der Frequenz (a) und die Stromdichten gegenüber dem angelegten elektrischen Feld (b) für jede Konfiguration, berechnet bei einer Temperatur von 10 K. Die Referenzstruktur zeigt eine Spitzenverstärkung von 142 cm −1 bei 8,7 THz, für Arsenidmaterial unerreichbare Frequenz. Lassen Sie uns sehen, wie n.i.d unsere QCL-Leistung beeinflusst. Ohne n.i.d beträgt die Spitzenverstärkung 127 cm −1 bei 8,46 THz. Der Verstärkungsabfall ist darauf zurückzuführen, dass die Ladungsträgerkonzentration im oberen Laserzustand abnimmt, nachdem Elektronen von n.i.d. Tatsächlich beträgt in der Referenzkonfiguration die Elektronenkonzentration des oberen und unteren Laserzustands ∆N = N 1 – N 2 = 5,43 ×10 12 cm −2 , ohne n.i.d wird es zu ∆N = N 1 – N 2 = 5.06 ×10 12 cm −2 . Das angelegte elektrische Feld verschiebt sich von – 84,5 auf – 81,6 kV/cm. Stromschwelle sinkt und verschiebt sich von 25,11 kA/cm 2 bei − 84,49 kV/cm bis 17,11 kA/cm 2 bei − 93,24 kV/cm. Der Stromdichteabfall kann auf die Verringerung der Streuung von Elektronenverunreinigungen zurückgeführt werden, was den Elektronentransport bei der Berechnung ohne n.i.d. erhöht. Ein weiterer Hinweis auf diese Hypothese ist der Peak bei − 64 kV/cm, den wir im Fall ohne n.i.d-Stromdichtecharakteristiken sehen. Dies ist ein Resonanztunnel zwischen den Perioden zwischen 4' und 3 (hier nicht gezeigt). Dieses Phänomen wird durch die Streuung von Elektronenverunreinigungen in den Stromkennlinien unter Berücksichtigung von n.i.d. Der Stromschwellenwert und die Verschiebung des angelegten elektrischen Felds werden einer Leitungsbandfehlausrichtung zwischen der Konfiguration mit oder ohne n.i.d. zugeschrieben. Obwohl die Verstärkungsspitze im n.i.d-Fall größer ist, beobachten wir interessanterweise eine Verbreiterung des Verstärkungsspektrums, wobei die Signatur geladener Verunreinigungen einen Einfluss hat. [31] Unbeabsichtigte Dotierung sollte bei einer vernünftigen Konzentration von 10 17 . bleiben cm −3 um eine Zersetzung durch Streuung von Elektronenverunreinigungen und eine Absorption freier Träger zu verhindern. In der Konfiguration ohne AD-Streuung beträgt die Spitzenverstärkung 147 cm −1 bei 8,7 THz. Wir beobachten, dass die Spitzenverstärkung mit oder ohne AD-Streuung bei der gleichen Frequenz liegt. Die optische Verstärkung wird nur geringfügig um 3% erhöht, wenn die AD-Streuung nicht in die Berechnung eingeht. Auch die Stromkennlinien sind nahezu identisch. Da unser Design einen geringen Aluminiumgehalt von 15% und ziemlich dünne Barrieren (1–1,5 nm) verwendet, ist der Einfluss der AD-Streuung in dieser QCL vernachlässigbar.

Simulierte maximale optische Verstärkung vs. Frequenz und Strom-elektrische Feldsimulationen für verschiedene Streuprozesse. a Simulierte optische Verstärkung vs. Frequenz unter Berücksichtigung unterschiedlicher Streuprozesse. b Strom-elektrische Feldsimulationen des GaN THz QCL unter Berücksichtigung verschiedener Streuparameter. Temperatur ist auf 10 K
. eingestelltIm Gegenteil, der Einfluss der IFR-Streuung auf die Leistung des Geräts ist wichtig. Ohne IFR-Streuung beobachten wir eine Spitzenverstärkung von 191 cm −1 bei 8,7 THz. Der Schwellenwert für die Stromdichte beträgt 24,08 kA/cm 2 . Diese Zunahme der Verstärkung um 34% und der Abfall der Stromdichteschwelle spiegeln die Tatsache wider, dass viele Elektronen durch IFR-Streuung transportiert werden. Je mehr IFR-Streuung, desto weniger Strahlungsstreuung gibt es für das Lasern. Beim Vergleich der Elektronenpopulation der Referenzkonfiguration des oberen und unteren Laserzustands ∆N = N 1 – N 2 = 6,6 ×10 12 – 1,27 × 10 12 = 5,43 ×10 12 cm −2 zu dem ohne IFR ∆N = N 1 – N 2 = 7,4 ×10 12 – 1,17 × 10 12 = 6,23 ×10 12 cm −2 , kann man sehen, dass die Elektronenpopulation des oberen Zustands höher ist. Dies ist auf die Lebensdauer des oberen Laserzustands zurückzuführen, die aufgrund des Fehlens von IFR-Streuung zunimmt. Im Vergleich zum Fall ohne Nid beobachten wir in den Stromdichtencharakteristika des Geräts ohne IFR-Streuung einen Peak bei − 67 kV/cm, Signatur des interperiodischen Resonanztunnels zwischen 4' und 3. Dieses Phänomen ist besser sichtbar im Fall ohne Berücksichtigung des IFR-Streuprozesses. Dies ist ein Beweis für seine Vorherrschaft gegenüber resonantem Tunneln. Mit diesen Beobachtungen unterstreichen wir die Dominanz des Einflusses der IFR-Streuung auf die Leistung der THz-GaN-QCL.
Nachdem ich die Bedeutung der IFR-Streuung für die THz-Leistung bemerkt hatte. Wir untersuchten weiter, indem wir die IFR-Größe variierten. Wir haben unserer Studie den Fall von IFR = 0.5 nm und 0.75 nm hinzugefügt. Die Korrelationslänge wird bei 1 nm gehalten. In Abbildung 3 haben wir die maximale Verstärkung gegenüber der Frequenz (a) und die Stromdichten gegenüber den Eigenschaften des angelegten elektrischen Felds (b) gezeigt. Zuerst haben wir beobachtet, dass für IFR = 0.5 nm die maximale optische Verstärkung auf 47,9 cm −1 . sinkt und fällt sogar dramatisch auf − 8.8 cm −1 Verlust der optischen Verstärkung für IFR = 0,75 nm. Die Verstärkungsverbreiterung als Funktion der IFR-Länge ist ebenfalls offensichtlich. Wie wir in den I-V-Eigenschaften sehen können, nimmt mit zunehmender IFR-Größe seine Rolle bei der Elektronenstreuung zu, erhöht die Stromdichten und verringert den Resonanztunnel- und Strahlungsstreuprozess in den Geräten. Dieser Effekt wird deutlich, wenn man die Referenzkonfiguration von IFR = 0,25 nm mit dem Extremfall von IFR = 0,75 nm vergleicht, die Elektronenpopulation des oberen und unteren Laserzustands sinkt von ∆N = 5,43 ×10 12 cm −2 zu ∆N = N 1 – N 2 = 3,71 ×10 12 cm −2 .
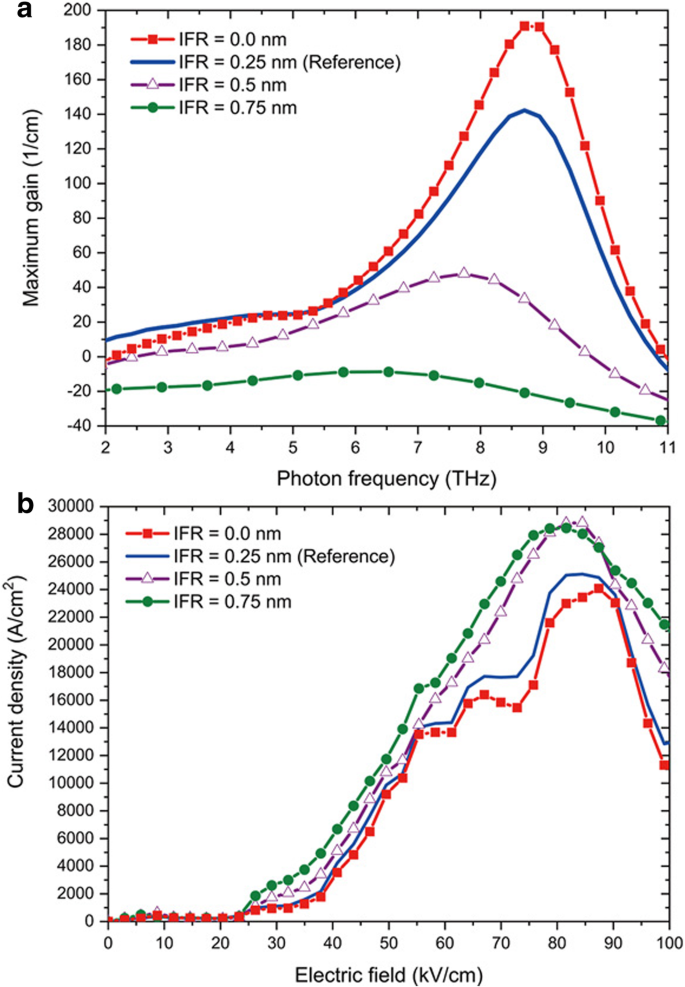
Simulierte maximale optische Verstärkung vs. Frequenz und Strom-elektrische Feldsimulationen für verschiedene IFR. a Simulierte maximale optische Verstärkung vs. Frequenz für verschiedene IFR. b Strom-elektrische Feldsimulationen des GaN THz QCL unter Berücksichtigung unterschiedlicher IFR. Temperatur ist auf 10 K
. eingestelltLetzteres nimmt so weit ab, dass wir kein Lasern mehr in den Geräten sehen können. Wie bereits in früheren Studien mit GaAs-basierter THz-QCL [25, 34,35,36] hervorgehoben wurde, betonen wir, wie wichtig es ist, die IFR-Größe während der Epitaxie zu berücksichtigen und sie kleiner als 0,5 nm zu halten, um die Herstellung von GaN-THz-QCL zu ermöglichen um eine positive optische Verstärkung zu erzielen.
Ein Vorteil von GaN-THz-QCL ist sein Potenzial, bei einer höheren Temperatur als GaAs-basierte THz-QCL zu arbeiten. In diesem Teil haben wir unsere Geräteleistung als Funktion der Betriebstemperatur analysiert. Wir haben weiterhin unsere Referenzgeräte mit IFR = 0,25 nm, n.i.d und AD in die Berechnung einbezogen. Abbildung 4 zeigt die maximale optische Verstärkung für verschiedene Gittertemperaturen. Der Verstärkungswert ist stabil von 10 bis 150 K bei etwa 142 cm −1 , beginnt sie zwischen 150 und 250 K zu sinken, um dann auf 61 cm −1 . zu sinken bei 300 K. Tatsächlich nimmt mit steigender Temperatur die Besetzungsinversion aufgrund der thermischen Auffüllung ab, und die Zunahme der LO-Phonon-Streuung induziert eine Verstärkungsverbreiterung. Dieser optische Verstärkungswert von 61 cm −1 ist immer noch höher als der Verlust eines GaN-THz-QCL-Doppelmetallwellenleiters (30 cm −1 ), was zeigt, dass dieses GaN-THz-QCL-Design in der Lage sein sollte, bei Raumtemperatur zu arbeiten. Wir erwähnen auch, dass GaN-basierte THz-QCL nicht nur bei Raumtemperatur betrieben werden können, sondern auch einen weiteren Vorteil haben:Aufgrund ihrer höheren Dotierungskonzentration, des niedrigeren Brechungsindex und der dünneren Periodenlänge haben sie das Potenzial, eine viel höhere optische Verstärkung zu bieten als in ihr GaAs-Pendant. Unser Design bietet einen relativ hohen optischen Verstärkungswert von 142 cm −1 bei 10 K, was ein gutes Beispiel ist.
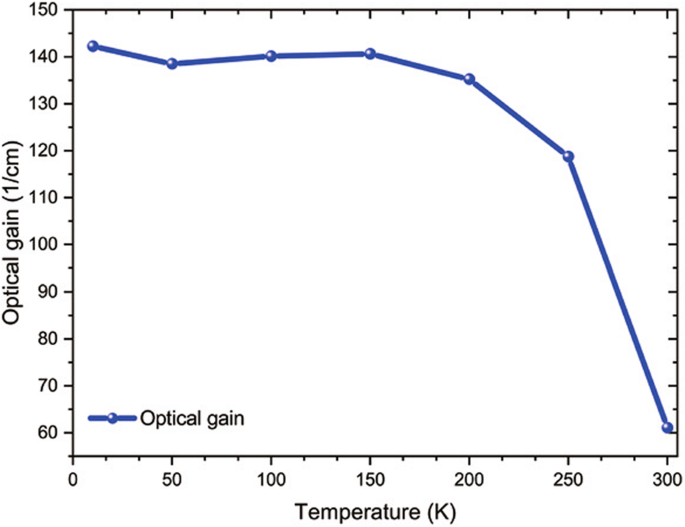
Eigenschaften der berechneten maximalen Verstärkung vs. Gittertemperatur
Schlussfolgerungen
Zusammenfassend berichten wir über ein Design von GaN-THz-QCLs, das bei 8,7 THz arbeitet. Die Simulation zeigt eine optische Verstärkung von 142 cm −1 bei 10 K und 60 cm −1 bei Raumtemperatur. Unter den unerwünschten Phänomenen, die von der Epitaxie herrühren, haben wir den Einfluss von Grenzflächenrauheit, unbeabsichtigter Dotierung und Legierungsstörung auf die Leistung der GaN-THz-QCL-Verstärkung berechnet. Der Einfluss der Legierungsstörung ist vernachlässigbar:Die optische Verstärkung sinkt nur von 147 auf 142 cm −1 beim Hinzufügen von Legierungsstörungsstreuung in der Simulation. Eine unbeabsichtigte Dotierung sollte bei der Konstruktion berücksichtigt werden, um eine Fehlausrichtung des Leitungsbandes zu verhindern. Wir haben in unserer Studie eine durch n.i.d. induzierte Verschiebung des angelegten elektrischen Felds von − 84,5 auf − 81,6 kV/cm beobachtet. Schließlich haben wir eine große Diskrepanz in der optischen Verstärkung für verschiedene Grenzflächenrauigkeitswerte beobachtet:191, 142, 47,9 und − 8,8 cm −1 für eine Grenzflächenrauheit von 0, 0,25, 0,5 bzw. 0,75 nm. Aus diesem Grund identifizieren wir den dominanten Einfluss der Streuung der Grenzflächenrauheit bei der Verschlechterung der optischen Verstärkung. Diese Arbeit bietet Wege zur Leistungsoptimierung eventuell zukünftiger GaN-THz-QCL-Fertigung.
Verfügbarkeit von Daten und Materialien
Die während der laufenden Studie generierten und/oder analysierten Datensätze sind auf begründete Anfrage beim entsprechenden Autor erhältlich.
Abkürzungen
- AD:
-
Legierungsstörung
- IFR:
-
Grenzflächenrauheit
- ISB:
-
Intersubband
- n.i.d:
-
Unbeabsichtigtes Doping
- NEGF:
-
Nichtgleichgewichts-Grüne Funktionen
- QCL:
-
Quantenkaskadenlaser
Nanomaterialien
- Einfluss von Molybdän auf die Leistung von Edelstahl
- Einführung in die Terahertz-Band
- Die Leistung von Glasfaser
- Einfluss von Wasser auf die Struktur und die dielektrischen Eigenschaften der mikrokristallinen und Nano-Cellulose
- Substratemittierende DFB-Quantenkaskadenlaser mit geringem Stromverbrauch
- Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs
- Photovoltaische Leistung einer Nanodraht/Quantenpunkt-Hybrid-Nanostruktur-Array-Solarzelle
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster
- Verstehen des Wachstumsmechanismus von GaN-Epitaxieschichten auf mechanisch abgeblättertem Graphit
- Konische Quantenkaskaden-Laser-Arrays, die in Talbot-Kavitäten integriert sind



